Method Article
用畸变校正扫描透射电镜进行单数字纳米电子束光刻
摘要
我们使用一个畸变校正扫描透射电子显微镜来定义两个广泛使用的电子束抵抗的单数字纳米模式: 聚甲基丙烯酸甲酯和氢 silsesquioxane。通过发射、等离子蚀刻和 organometallics 的抗渗, 可以将抗性模式复制到单位纳米保真度选择的目标材料中。
摘要
通过采用畸变校正扫描透射电镜作为曝光工具, 我们演示了用传统的抗性和模式传递过程对单位纳米尺寸进行电子束光刻的推广。在这里, 我们提出了两个广泛使用的电子束抵抗的单数字纳米模式的结果: 聚甲基丙烯酸甲酯和氢 silsesquioxane。该方法实现了聚甲基丙烯酸甲酯的 sub-5 纳米特征和 sub-10 在氢 silsesquioxane 中的纳米分辨率。这些模式的高保真转移到目标材料的选择可以使用金属升降, 等离子蚀刻, 并抵制渗透与 organometallics。
引言
本手稿中提出的协议为在聚甲基丙烯酸甲酯 (PMMA) 和氢 silsesquioxane (HSQ) 中定义具有单位数纳米分辨率的模式提供了指导, 这是两种常用的电子束抵抗, 用于电子束光刻高分辨率图案。我们使用一种像差校正扫描透射电子显微镜 (词干) 作为曝光工具, 配备了用于控制电子束的模式发生器来实现这些结果。在抵抗曝光后, 纳米级的模式可以转移到各种目标材料1, 从而使新的设备在一个数字的纳米分辨率制造。
以前的研究表明电子束光刻 (EBL) 能够在 sub-10 纳米尺度2、3、4、5、6等维度的抗性材料中定义模式。然而, 对于大约4毫微米的尺寸, 这些演示要求非标准程序, 如使用辅助结构7或长期暴露时间为自我发展抵抗8。其他 nanopatterning 技术, 如电子束诱导沉积9或扫描探针光刻10,11, 已证明能够实现 sub-4 纳米分辨率, 虽然这些需要显著比 EBL 更长的曝光时间。
现代专用 EBL 系统在少数纳米长度尺度 (2-10 nm) 中产生光斑大小的电子束, 这使得定义模式与 sub-10 纳米分辨率非常困难。相比之下, 我们的协议实现 EBL 使用一个畸变矫正阀杆, 这是一个高度优化仪器的材料表征在埃长度尺度。这种差异允许常规模式的记录打破光刻特征与单纳米分辨率1。虽然最先进的, 商业畸变矫正的茎系统成本在数以百万计的美元, 它们可用于几个国家的用户设施, 有些是可访问的, 没有成本。
研究方案
1. 抗涂层试样的制备
注: 在这项工作中, 以单数字纳米分辨率的模式定义在 PMMA (正负色调) 和 HSQ 抵抗, 这是自旋投射到商业上可用的 TEM 窗口 (约50µm x 50 µm) 与罪x或2膜的厚度范围从5毫微米到 50 nm。一个或多个 TEM 窗口是捏造的3毫米直径硅处理框架 (100 µm 厚)。在这篇手稿中, 我们把整个单元称为 tem 芯片和电子束透明膜作为 tem 窗口。
- 在 100 W (大约 5 sccm O2流) 中执行 O2等离子清洗, 去除 TEM 芯片上的任何有机残留物 (230 mT 的室压)。
- 将一块硅片, 大约2厘米 x 2 厘米的尺寸, 用作透射电镜芯片在抗纺过程中的持有者。
- 将双面碳带的两条条纹近似地与硅保持架的中心等距, 并稍微小于 TEM 芯片的直径 (见图 1)。用异丙醇 (IPA) 冲洗条纹, 以降低其粘接强度。这是必要的, 以避免打破微妙的 TEM 芯片删除时, 从 Si 持有人。
- 在硅支架上安装 TEM 芯片, 确保它只附着在两个相反边缘的碳带条纹上, 如图 1所示。
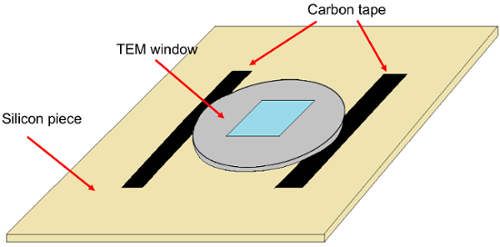
图 1: 用于抗纺的 TEM 芯片支架.请注意, TEM 芯片只附着在两个边缘的硅持有者, 以减少表面接触, 因此, 粘合力。请单击此处查看此图的较大版本.
2. PMMA (正负色调) 和 HSQ 的自旋涂层参数
注: 抗厚度不直接测量 TEM 芯片, 因为它是小的, 通常是在其他薄薄的层上铸造 (如Si 薄膜在2膜), 这使测量复杂化。相反, 抵抗厚度是确定的自旋速度校准使用反射测量从薄膜铸造的散装 Si 样品。反射的结果得到了证实, 通常精度优于 20%, 由杆顶向下图像的倒塌结构。
- 安装在微调器卡盘上的硅支架, 并将 TEM 窗口的中心近似地与微调转子的中心对齐。
- 使用吸管, 覆盖整个 TEM 窗口与一滴 (大约0.05 毫升) pmma (A2 950K pmma 稀释甲醚到 0.5-1.0%) 或 HSQ (1% 固体 XR-1541)。
- 根据所使用的抵抗, 按照表 1所示的自旋涂层和烘烤参数。
- 小心地从硅支架上取下 TEM 芯片。用光学显微镜检查透射电镜窗口的抗均匀性。如果胶片在膜的中央区域是均匀的, 则进行下一步;否则, 在一个新的 TEM 窗口重复抵抗涂层的过程。
| 抵抗 | 旋转速度 (x g) | 电影 厚度 毫微米 | 烘烤温度 °C | 烘烤时间 分钟 |
| 正色调 PMMA | 60 | 30 | 200个 | 2个 |
| 负色调 PMMA | 60 | 15 | 200个 | 2个 |
| HSQ | 107 | 10 | 不需要b | 不需要b |
| a参见参考文献 12;b见参考文献13 | ||||
表 1: 抗自旋涂层和烘烤参数.旋转速度单位在 x g 考虑一个3毫米直径 TEM 芯片。烘烤是在热板上进行 PMMA。HSQ13不需要烘焙。HSQ 是冷藏的, 所以在纺纱前需要预热室温。
3. 在阀杆中加载样本, 映射窗口坐标, 并执行高分辨率聚焦
- 将抗涂层 TEM 芯片安装在阀杆试样架上, 确保抗真空界面面对进梁, 因为光束最优化地聚焦在试样的顶端。另外, 要确保 TEM 窗口的两侧与阀杆的 x 轴和 y 轴线近似对齐。这将有助于导航到 TEM 窗口。
- 将 TEM 芯片加载到显微镜中, 并在夜间泵送, 以减少样品室中的污染物。
- 移动舞台 (x, y) 坐标, 使光束超过100µm 远离 TEM 窗口的中心 (以避免意外曝光)。将阀杆探头的电流和能量分别设置为 34 pA 和200个凯文。
- 在衍射模态成像 (固定光束、z 对比模式和中角环形暗场检测器) 中, 将光束放大到 30 kX, 使其更容易找到透射电镜窗口的边缘。
注意: 在成像模式中也可以找到 TEM 窗口边缘。我们使用衍射模式, 因为它是更快的, 因为光束不需要扫描形成图像。 - 向 TEM 窗口导航, 直到在衍射图像上观察到窗口的边缘。沿窗口边缘导航, 并记录 TEM 窗口四角的 (x、y) 坐标。
- 在最后一个窗口拐角处, 通过移动舞台 z 坐标 (z 高度调整), 直到观察到衍射图案方向的交叉点, 将放大倍数提高到 50 kX, 并对窗膜进行粗糙聚焦。随后, 通过调整物镜的电流来进行精细对焦。
- 将放大倍数提高到 180 kX。调整焦点、stigmation 和畸变校正设置, 以获得像图 2B所示的窗膜的畸变校正衍射图像。这种聚焦方法被称为 Ronchigram 方法14。

图 2: 透射电镜窗膜的衍射图像.(A) 有重点但柱头的形象。这一图像的畸变校正设置是不最佳的, 这证明了紧密间距的衍射条纹。(B)曝光准备好的非 stigmated 图像, 显示平滑的高原衍射图案。请单击此处查看此图的较大版本.
4. 使用带有模式发生器系统的畸变矫正阀杆暴露图案。
注: 这项工作中使用的畸变矫正阀杆装有模式发生器系统 (PGS), 它控制电子束位置, 从而暴露出使用计算机辅助设计 (CAD) 软件定义的模式。剂量是通过定义曝光点 (步长) 和每点曝光时间之间的间距来控制的。表 2总结了本协议中使用的暴露参数。模式是暴露在 TEM 窗口的中心, 在 "连续模式", 因为这项工作中使用的阀杆不包括光束消除器。在曝光之前和之后, PGS 将光束定位在视场中任何用户定义的点 (FOV) 中, 最好远离图案区域。我们在本协议中使用了 FOV 的右上角和下直角, 分别作为初始和最终光束位置。
| 抵抗 | 点曝光 | 线曝光 | 区域曝光 | ||
| 剂量 (fC/点) | 台阶尺寸 毫微米 | 剂量 (nC/cm) | 台阶尺寸 毫微米 | 剂量 (µC/厘米2) | |
| 正色调 PMMA | 10-100 | 0。5 | 2–8 | 0。5 | 2000 |
| 负色调 PMMA | 50-500 | 0。5 | 20–40 | 0。5 | 50,000–80,000 |
| HSQ | 10-100 | 0。5 | 10–20 | 0。5 | 20,000–30,000 |
表 2: PMMA (正负色调) 和 HSQ 的曝光参数.所显示的值是通用的, 因为最佳剂量值取决于特定的模式设计和目标特征维度。
- 关闭横梁闸阀, 以避免在移动舞台时任何意外的抵抗接触。验证光束电流为 34 pA, 放大倍数为 180 kX。
- 使用预录制的窗口角坐标移动舞台, 使 FOV 中心距离窗口中心5µm。使用步骤3.6 中描述的 Ronchigram 方法打开光束闸阀并将焦点集中在这一点上。
- 关闭横梁闸阀。移动舞台将 FOV 放在 TEM 窗口的中心。将放大倍数更改为 18 kX (对应于5µm x 5 µm 图案 FOV)。将光束控制转移到 PGS 并将光束定位到远离图案区域的位置 (我们使用该协议的右上角)。
- 快速连续执行下列动作, 以避免在初始和最后光束位置曝光过度抵抗。
- 打开闸阀并通过观察光束衍射图象来验证光束是否聚焦在初始光束位置上 (如图 2B所示)。公开模式。
- 当曝光完成后, 检查衍射图案图像是否仍然聚焦在最终光束位置。最后, 关闭闸阀。
- 从阀杆上取下 TEM 芯片。
5. 抗发展和关键点干燥
注: 开发过程取决于所使用的抵抗。步骤5.1、5.2 和5.3 分别描述了正色调 pmma、负色调 pmma 和 HSQ 的开发过程。然而, 所有抵抗共享相同的最终临界点干燥过程, 这是必要的, 以避免模式崩溃, 由于高纵横比的模式制造的这个协议。临界点干燥 (国家方案文件) 使用液体 CO2作为工作流体, 不与水混溶。因此, 样品脱水 (步骤 5.4-5.7) 要求使用 ACS 试剂级异丙醇 (IPA)。
- 正色调 PMMA15的发展: 用3:1 溶液制备100毫升烧杯: 甲基异丁基酮 (MIBK)。将烧杯放在0摄氏度的沐浴循环器中 (0 摄氏度的冰浴是一种较低的成本选择), 并等到温度均衡。用一把镊子抓住 TEM 芯片, 在三十年代的冷溶液中轻轻搅拌. 继续执行步骤5.4。
- 负色调 PMMA16的发展: 在室温下 (24 °c) 轻轻搅动 TEM 芯片 MIBK 2 分钟. 将样品转移到丙酮溶液中, 搅拌3分钟. 继续步骤5.4。
- HSQ13的发展: 在 "咸" 去离子水溶液中搅拌 TEM 芯片, 含 1 wt% 氢氧化钠和 4 wt% 氯化钠, 4 分钟24摄氏度。将晶片在纯净的去离子水中搅拌2分钟 (冲洗掉咸的显影液)。继续执行步骤5.4。
- 将 TEM 芯片浸入 ACS 试剂级, 并轻轻搅拌三十年代。
- 快速将 TEM 芯片放置在图 3A所示的特殊 2 "Si 晶片上。确保透射电镜芯片在传输过程中总是湿的。在大约2-3 分钟后, 按图 3B所示, 关闭持续的晶圆支架组件。让整个单位浸泡在 ACS 试剂级的投资促进器, 以补充15分钟完全沉浸在 IPA。
- 迅速将完整的可持续使用的晶圆架装配到第二个容器中, 新的 ACS 试剂级的 ipa, 并留在15分钟完全沉浸在 IPA。
- 将可持续的晶圆固定器组件转移到持续时间的仪器处理室 (在任何时候 TEM 芯片都应该完全沉浸在 IPA 中)。按照仪器的操作说明运行持续进修流程。
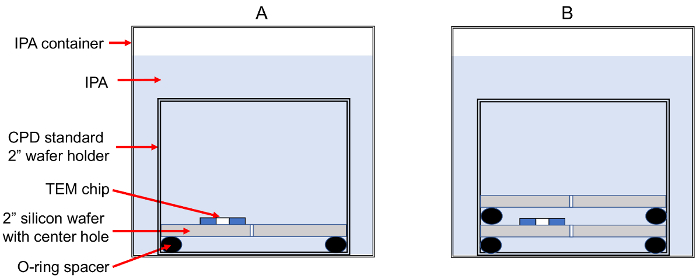
图 3: 内部解决方案中的 TEM 芯片脱水的标准 2 "晶片持有人。(a)在一个特殊的 2 "硅晶片上, 在中心 (直径约500微米) 上钻孔的 TEM 芯片的示意图侧视图, 允许液体流动。该晶片符合国家系统制造商提供的标准 2 "晶片持有人。(B)第二个特殊硅晶片封装 TEM 芯片, 从而减少在国家方案进程中的湍流流动。在 A 和 B 中, 该专业的晶片持有人完全沉浸在 ACS 试剂级的 IPA。请单击此处查看此图的较大版本.
结果
图 4显示了在正色调有机玻璃上的平版图案 (在开发后抵抗从暴露的区域去除) 和阴性音调 pmma (抵抗从未曝光的区域去除)。TEM 窗口包括大约30毫微米厚实的 pmma 抵抗为正面口气 pmma (15 毫微米厚实为阴性口气 pmma) 旋转铸造在5毫微米厚实的罪孽x膜。在发展了正色调 PMMA 后, 在茎部成像过程中形成了一层薄薄的金属膜 (10 纳米 AuPd 超过5纳米钛)。对于正色调 PMMA, 平均最小隔离特征是 2.5 0.7 nm (图 4C, 4D), 而最小的间距模式是 17.5 nm (图 4F)。对于负色调 PMMA, 平均最小隔离特征是 1.7 0.5 nm (图 4G), 而最小的间距模式是 10.7 nm (图 4J)。

图 4: 畸变校正电子束光刻正、负色调 PMMA.(一层10纳米 AuPd 超过5纳米 Ti 的薄膜被沉积在这个图中显示的所有正色调 PMMA 图案上。(A)正色调 PMMA 中任意图案的 SEM 图像。(B)负离子 PMMA 中任意图案的 TEM 图像。(C、D)在正色调 PMMA 中最小花纹孔的 SEM 图像, 平均孔径为 2.5 0.7 nm。(E、F)在正色调 PMMA 上定义的孔阵列的 SEM 图像, 其间距为 21.5 nm (E) 和 17.5 nm (F)。(G、H)20 nm 沥青的负色调 PMMA 中柱阵的透射电镜图像, 平均柱直径为 1.7, 0.5 nm (G) 和 1.8 * 0.5 nm (H)。(i、J)负色调 PMMA 柱阵列的透射电镜图像分别为15.2 和 10.7 nm。所有刻度条均为 40 nm。这个数字从 Manfrinato、检定、斯坦、A、张、L、南、Y、Yager、K.G.、淀粉、E、和黑色、ct 畸变校正电子束光刻在一个纳米长度标度被复制了。纳米.17 (8), 4562-4567 (2017)。请单击此处查看此图的较大版本.
图 5显示了在 HSQ 抵抗上定义的模式。用于 HSQ 光刻的 TEM 窗口包括大约 10 nm 厚 HSQ 抗旋铸在 27 nm 厚硅膜。在暴露和抵抗发展之后, 在窗口的无 HSQ 区域 (未暴露的区域) 的超薄 Si 层的3-4 毫微米由电感耦合等离子体 (ICP) 蚀刻使用 50 sccm HBr 和 20 sccm Cl2气体的混合物在室压力下被去除10 mT (偏倚和 ICP 功率分别为 60 w 和 250 w)。图 5A由四行的短垂直线组成。上两行暴露与线剂量从2到 120 nC/cm (0 nm 设计的宽度, 这些线) 跨步。更低的二列被暴露与区域药量从3000到6万微机/cm2 (5 毫微米宽和200毫微米长的被设计的长方形) 跨步地被加强。图 5B是图 5A中底部行的中心区域的放大图像。两个最左边的, 四中心, 和四最右边的线暴露了面积剂量 23300, 27300, 3.2万微机/cm2, 分别。四中心线有平均被测量的宽度7毫微米。

图 5: 畸变校正电子束光刻 HSQ 抵抗.(该图中使用的 TEM 窗口由27纳米厚 Si 组成。HSQ 开发后, 采用电感耦合等离子蚀刻法从未覆盖的 HSQ 区域中去除 3-4 nm 的 Si。(A)透射电镜图像的四行垂直线暴露的剂量从2到 120 nC/厘米 (前两行) 和3000至6万微机/厘米2 (下两行)。光束步长为所有线的 0.5 nm。( B)在 (A) 下一行的中心区域的高放大率透射电镜图像。在中心的4行组的平均测量宽度为 7 nm, 并暴露在面积剂量27300微机/厘米2。请单击此处查看此图的较大版本.
讨论
该协议中最关键的一步是在曝光前聚焦电子束。这是实现最高分辨率模式所必需的。当执行多个曝光 (例如,当 TEM 芯片有多个窗口, 每一个被图案), 重要的是要重新调整光束之前, 每次曝光的距离为5微米从曝光区。该协议还包括在曝光前和之后检查光束焦点的步骤, 在阵列区域的两个极端位置 (顶部和底部角) 上, 这样可以确定在阵列中是否发生了一些离焦现象, 例如由于在图形区域中局部倾斜的膜。
该协议的另一个重要步骤是在开发暴露的抗性模式后, 使用临界点干燥 (国家方案文件) 干燥样品。如果没有这一步, 模式将经常崩溃, 因为图案结构的高纵横比 (即,花纹的抵抗横向尺寸小于厚度)。大多数系统提供标准的 2 "晶片持有人。然而, 由于 TEM 芯片是非常小的和图案的结构是相当微妙的, 他们可能会被损坏的过程中, 当被放置在设计为较大的样品的持有人。图 3显示了使用标准晶圆架的 TEM 芯片的内部解决方案。这两个晶片, 在中心有一个流动的孔, 它包围了 TEM 芯片, 并保护它不受湍流流动的过程中。
最佳抗膜厚度的测定试图平衡竞争要求。一方面, 它应该尽可能薄, 以达到最高的分辨率和避免模式崩溃, 但另一方面, 它应该是足够厚的模式转移应用, 如升降和蚀刻。这个协议使用 1% HSQ, 这是最低的稀释在商业上可利用, 并且在实验室进一步稀释不推荐 (我们的经验表明稀释的 HSQ 经常导致部份交联)。然而, 由于稀释 pmma 确实提供了可重现的结果, 此协议使用1% 为正色调 PMMA (30 毫微米厚度) 和0.5% 和1% 为阴性口气 (15 和30毫微米厚度, 分别)。我们发现, 正色调 pmma 抗不受模式崩溃的负面色调 PMMA, 因此使用较薄的厚度为负数, 如表 1所示。此外, 在电子束曝光 (和开发前), 负色调 pmma 有 ~ 50% 厚度损失, 所以负色调 pmma 的最终厚度为7至 15 nm。(图 4中的1.7 和 1.8 nm 特征有大约7毫微米抵抗厚度, 这是在模式崩溃的极限.)图 4所示的 PMMA 模式没有使用一个持续进修的步骤;但是, 如果可用, 本议定书建议在发展 PMMA 模式后使用国家方案文件。与此相反, 我们发现, 由于不能进一步稀释 (以达到更薄的厚度), 并且由于需要更厚的 HSQ 模式作为蚀刻掩模 (例如,如图5所示, 蚀刻硅, 所以 HSQ 处理至关重要. ).
图 4中的正色调 PMMA 图案被涂上薄薄的金属膜, 以增加成像过程中的对比度。Manfrinato 工作中的支持信息. 1表明, 这种金属涂层对模式计量的影响是微不足道的。同样, 我们认为,图 5中所示的 HSQ 抗性的结果, 并没有很强地依赖于基于 Si 层超薄厚度的 TEM 窗口结构的特殊选择。
据我们所知, 所有的测量结果中描述的正负色调 PMMA1 (图 4) 是在文献中报告的最小的特征迄今1,7,12,16,17. Manfrinato等。1也证明了 sub-5 nm 模式转移, 从抵抗到目标材料, 使用常规金属升降 (为正色调 pmma) 和顺序渗透合成18氧化锌 (为阴性口气 pmma)。图 5中显示的 HSQ 的结果不是最小的报告特征7。但是, 此协议对于在 HSQ 中获得超过 10 nm 的分辨率的可重现特性非常有用, 并演示了硅结构的单数字模式。
本文介绍了一种用传统电子束抵抗 PMMA 和 HSQ 对任意结构进行单数字纳米分辨的方法。此外, 在这里和参考文献1显示的结果表明, 这种模式可以转移高保真度的目标材料的选择。
披露声明
作者没有什么可透露的。
致谢
这项研究使用了功能性纳米材料中心的资源, 这是美国能源部科学设施办公室, 在布鲁克黑文国家实验室根据合同编号。DE-SC0012704。
材料
| Name | Company | Catalog Number | Comments |
| Plasma asher | Plasma Etch | PE-75 | Located in class 100 cleanroom |
| Silicon Nitride 5 nm thick TEM Windows (9 SMALL Windows) | TEM windows.com | SN100-A05Q33A | |
| TEM chip holder for resist coating | Home made | ||
| 27 nm thick c-Si TEM Windows | TEMwindows.com | Custom order | |
| A2 950K PMMA diluted in anisole to 0.5-1.0% by weight | MicroChem | M230002 | |
| HSQ (1% solids XR-1541) e-beam resist in MIBK | Dow Corning | XR-1541-001 | |
| Spinner | Reynolds Tech | ReynoldsTech Flo-Spin system | Located in class 100 cleanroom |
| Hot plate | Brewer Science | CEE 1300X | Located in class 100 cleanroom |
| Spectral reflectometer | Filmetrics | F20 | Located in class 1000 cleanroom |
| Bath circulator | Thermo Scientific | Neslab RTE 740 | Located in class 100 cleanroom |
| Optical microscope | Nikon | Eclipse L200N | Located in class 1000 cleanroom |
| MIBK/IPA 1:3 developer | MicroChem | M089025 | |
| Sodium hydroxide | Sigma-Aldrich | 221465 | |
| Sodium chloride | Sigma-Aldrich | 31434 | |
| Isopropyl Alcohol, ACS Reagent Grade | Fisher Scientific | MK303202 | |
| TEM chip holder for critical point drying | Home made | ||
| Critical point drying system | Tousimis | Autosamdri-815B, Series C | Located in class 100 cleanroom |
| Aberration-corrected STEM | Hitachi | HD 2700C | |
| Pattern generation system | JC Nabity Lithography Systems | NPGS v9 | |
| Scanning Electron Microscope (SEM) | Hitachi | S-4800 | |
| Reactive ion etcher | Oxford Instruments | Plasmalab 100 | Located in class 1000 cleanroom |
参考文献
- Manfrinato, V. R., Stein, A., Zhang, L., Nam, C. Y., Yager, K. G., Stach, E. A., Black, C. T. Aberration-Corrected Electron Beam Lithography at the One Nanometer Length Scale. Nano Letters. 17 (8), 4562-4567 (2017).
- Chen, W., Ahmed, H. Fabrication of 5-7 nm wide etched lines in silicon using 100 keV electron-beam lithography and polymethylmethacrylate resist. Applied Physics Letters. 62 (13), 1499-1501 (1993).
- Vieu, C., Carcenac, F., Pepin, A., Chen, Y., Mejias, M., Lebib, A., Manin-Ferlazzo, L., Couraud, L., Launois, H. Electron beam lithography: resolution limits and applications. Applied Surface Science. 164, 111-117 (2000).
- Hu, W., Sarveswaran, K., Lieberman, M., Bernsteina, G. H. Sub-10 nm electron beam lithography using cold development of poly(methylmethacrylate). Journal of Vacuum Science & Technology B. 22 (4), 1711-1716 (2004).
- Chen, Y. Nanofabrication by electron beam lithography and its applications: A review. Microelectronic Engineering. 135, 57-72 (2015).
- Jiang, N. On the spatial resolution limit of direct-write electron beam lithography. Microelectronic Engineering. 168, 41-44 (2017).
- Manfrinato, V. R., Zhang, L., Su, D., Duan, H., Hobbs, R. G., Stach, E. A., Berggren, K. K. Resolution Limits of Electron-Beam Lithography toward the Atomic Scale. Nano Letters. 13 (4), 1555-1558 (2013).
- Isaacson, M., Muray, A. In situ vaporization of very low molecular weight resists using 1/2 nm diameter electron beams. Journal of Vacuum Science & Technology B. 19 (4), 1117-1120 (1981).
- van Dorp, W. F., van Someren, B., Hagen, C. W., Kruit, P. Approaching the Resolution Limit of Nanometer-Scale Electron Beam-Induced Deposition. Nano Letters. 5 (7), 1303-1307 (2005).
- Fuechsle, M., Miwa, J. A., Mahapatra, S., Ryu, H., Lee, S., Warschkow, O., Hollenberg, L. C. L., Klimeck, G., Simmons, M. Y. A single-atom transistor. Nature Nanotechnology. 7 (4), 242-246 (2012).
- Randall, J. N., Lyding, J. W., Schmucker, S., Von Ehr, J. R., Ballard, J., Saini, R., Xu, H., Ding, Y. Atomic precision lithography on Si. Journal of Vacuum Science & Technology B. 27 (6), 2764-2768 (2009).
- Arjmandi, N., Lagae, L., Borghs, G. Enhanced resolution of poly(methyl methacrylate) electron resist by thermal processing. Journal of Vacuum Science & Technology B. 27 (4), 1915-1918 (2009).
- Yang, J. K. W., Berggren, K. K. Using high-contrast salty development of hydrogen silsesquioxane for sub-10-nm half-pitch lithography. Journal of Vacuum Science & Technology B. 25 (6), 2025-2029 (2007).
- Lin, J. A., Cowley, J. M. Calibration of the operating parameters for an HB5 STEM instrument. Ultramicroscopy. 19 (1), 31-42 (1986).
- Cord, B., Lutkenhaus, J., Berggren, K. K. Optimal temperature for development of poly(methylmethacrylate). Journal of Vacuum Science & Technology B. 25 (6), 2013-2016 (2007).
- Duan, H. G., Winston, D., Yang, J. K. W., Cord, B. M., Manfrinato, V. R., Berggren, K. K. Sub-10-nm half-pitch electron-beam lithography by using poly(methyl methacrylate) as a negative resist. Journal of Vacuum Science & Technology B. 28 (6), C6C58-C6C62 (2010).
- Dial, O., Cheng, C. C., Scherer, A. Fabrication of high-density nanostructures by electron beam lithography. Journal of Vacuum Science & Technology B. 16 (6), 3887-3890 (1998).
- Kamcev, J., Germack, D. S., Nykypanchuk, D., Grubbs, R. B., Nam, C. Y., Black, C. T. Chemically Enhancing Block Copolymers for Block-Selective Synthesis of Self-Assembled Metal Oxide Nanostructures. ACS Nano. 7 (1), 339-346 (2013).
转载和许可
请求许可使用此 JoVE 文章的文本或图形
请求许可探索更多文章
This article has been published
Video Coming Soon
版权所属 © 2025 MyJoVE 公司版权所有,本公司不涉及任何医疗业务和医疗服务。