需要订阅 JoVE 才能查看此. 登录或开始免费试用。
Method Article
N极性InAlN阻高电子迁移率晶体管的等离子体辅助分子束外延
摘要
分子束外延用来生长N极性InAlN阻高电子迁移率晶体管(HEMT器件)。在光滑,组成均匀InAlN层和HEMT的晶圆准备控制层生长条件和外延结构的结果与流动性高达1750厘米2 / V∙秒。
摘要
等离子体辅助分子束外延非常适合于III族氮化物薄膜和异质的具有高品质的高电子迁移率晶体管(HEMT器件)需要平滑,突变接口外延生长。的过程提出了N极性InAlN HEMT器件的生长,包括晶圆制备和缓冲层,所述InAlN阻挡层的AlN和GaN中间层和GaN沟道的生长。在该过程的每个步骤中的关键问题被识别,如避免在GaN缓冲嘎积累,温度对InAlN组成均一性的作用,以及在AlN层间期间使用Ga束流的和中断的GaN之前信道的增长。组成均匀N极性InAlN薄膜,证明用低至0.19纳米和表面根均方粗糙度InAlN基于被报告的HEMT结构具有带片电荷密度迁移率高达1750厘米2 / V∙秒为设备为1.7×1013厘米-2。
引言
分子束外延(MBE)是一种多功能的外延薄膜生长技术,其用碱的压力低至10 -11乇采用的超高真空环境,以确保在生长膜低杂质掺入。外延生长层的组成和生长速率是通过控制每一个喷射室的温度,并且因此各种源物质的蒸发通量测定。在III族氮化物外延,Ⅲ族元素(在,铝,镓),而活性氮(N *)磁通由任一的N 2等离子体1,2-(RF等离子体提供通常由喷射室中提供的基的情况下-assisted MBE:PAMBE或RFMBE)或氨(NH 3 -MBE)3,4- MBE生长的5特征在于较低的生长温度和更清晰的界面陡峭比其他的外延生长技术,如金属有机化学气相沉积的示意图被示出。在图1中。
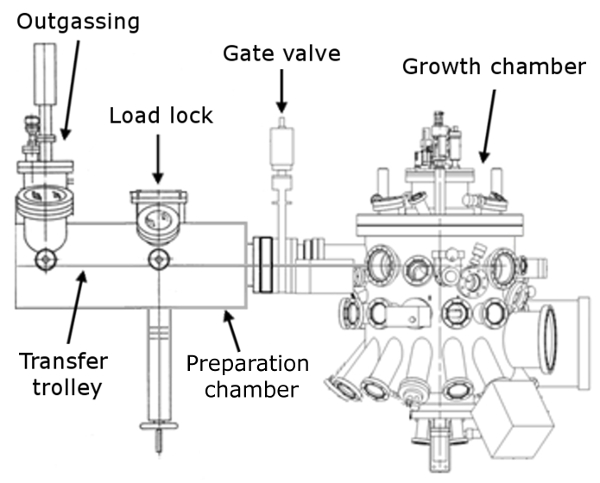
图1:。MBE系统原理示意图,显示加载锁定,传送系统,除气站和生长室请点击此处查看该图的放大版本。
III族氮化物可以在具有各种晶体取向衬底上生长。最常用的取向是镓极性的c面,它允许的二维电子气的形成而不掺杂通过利用阻挡层,通常AlGaN和GaN沟道之间偏振差。氮化镓的各种非极性和半极性方向已收到光电子显著注意由于在量子阱,这也使得这些取向不太希望为HEMT应用A 6,7-减小极化效应纳秒。 N极性导向设备是用于下一代高频HEMT操作有吸引力,由于比常规镓极性设备几个固有的优点。8在N极性装置的阻挡层生长在GaN沟道下方, 如图2,所得在自然回屏障有助于该信道的静电控制和减少短沟道效应,同时允许容易当前接入到GaN沟道和减少接触电阻。阻挡也可以从通道分别控制,这样,当信道厚度按比例缩小的用于高频器件的屏障设计可以被修改,以补偿失去的费米能级钉扎效应信道的费用。
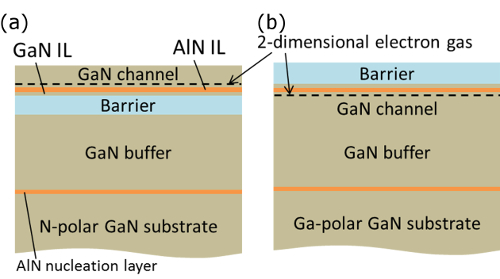
图2:(a)一种N极性HEMT和(b)一种镓极性HEMT为COMPAR的外延层概略层结构ISON。 请点击此处查看该图的放大版本。
在高速使用HEMT器件,高功率放大器通常生长在SiC衬底采取SiC的高热导率的优点。低的穿透位错密度的独立式GaN衬底可以被用来提高电子迁移率,9从而改善高频性能。以下的AlN成核层的生长,一个厚的GaN缓冲生长到空间中的杂质在离HEMT信道的再生长界面分离并改善电隔离。不像其他的III-V材料,氮化镓由PAMBE生长通常需要的生长条件与一组-III / V比大于1, 即 ,富金属的条件下,10,11,以达到平滑的表面形态更大。 x中铝1×N的是一个ALTER天然阻挡材料为III族氮化物HEMT器件,并已收到显著关注最近,因为它可以生长晶格匹配的GaN对于x≈0.18,并可以在相对的AlGaN障碍两次沟道电荷由于其高自发极化产生12-15不同于的AlGaN障碍,镓将优先结合到在InAlN层,16因而必须小心,以确保富Ga GaN缓冲层的生长和InAlN生长之前后的表面是自由过量的Ga。
镓的表面上控制可以通过suppling Ga的磁通比Ga的液滴形成所需的磁通稍小来完成。然而,这种增长窗口小,并且不足镓表面覆盖将导致表面形态降解成高原/沟槽的形态,而过量的Ga束流会导致镓积累和宏观液滴形成。17反射高能电子衍射(RHEED)INTENS性可用于监测镓积累和解吸。ガ表面覆盖率是通过RHEED强度降低,和关闭ガ之间任何滞后指示(和N *)百叶窗和在RHEED强度的初始增加表明镓累积, 如图3。

图3:监控嘎覆盖,使用触发采集下旋转收购RHEED模式计量的RHEED强度 RHEED强度信号。 (未示出)不足Ga束流通过关闭快门之后立即增加强度指示。饱和/理想嘎覆盖率由快门关闭和突然的RHEED增白和多余嘎覆盖率视为初始RHEED增亮两个延迟以及导致全强度恢复较为缓慢强度增加的时间超过60秒之间的延迟表示。COM /文件/ ftp_upload / 54775 / 54775fig3large.jpg"目标="_空白">点击此处查看该图的放大版本。
实现高品质通过PAMBE InAlN由横向成分波动的存在复杂的,导致由以富以界包围富铝域的"蜂窝"的微观结构。此微结构18消除是通过使用基板温度约50取得℃下在解吸,15,19,20或约630℃,N极性InAlN发作以上。在这种高温下生长机制,则在具有In x Al 1-×N个组合物是衬底温度的强函数,以导致较低的掺入更高的温度。该通量可以增加以补偿蒸发掉,但实际上最大的在流量由掺入效率的降低与增加流量限制21除了降低衬底温度或增加在通量,增加生长速度也可以增加在组合物由于"以掩埋效应",其中,进入的铝原子陷阱以及防止其蒸发。21,22高等生长速率可以通过按比例增加的In和Al通量来实现。为了保持生长条件Ñ富中,N *将需要以及增加,这可以通过增加RF等离子体功率来实现,增加的 N 2流量,改善了等离子体室设计,或者增加光圈板孔密度。
在基于InAlN类HEMT额外外延层包括GaN和AlN中间层(离子液体)和GaN沟道。 AlN的IL插入的屏障和渠道之间能增加流动性μ以及沟道薄层电荷密度N s 个 。在移动性的增加归因于减少与InAlN B电子波函数重叠arrier和随后的合金散射。9为确保在AlN的IL高质量的增长,过量的Ga束流的生长过程中供给到充当表面活性剂。的GaN的IL可以在AlN IL和屏障之间使用,以进一步改善流动性,同时减少信道的费用。 GaN沟道可以在相同的温度下InAlN屏障来生长,允许从阻挡尽管离子液体和信道持续增长。改进的流动性已经被中断的AlN IL后生长和生长所述GaN沟道之前增加的生长温度下得到。在这种情况下的保护镓表面覆盖有中断,以防止流动性降解过程中被保持。
下面的协议特别适用于生长在N极性GaN衬底InAlN屏障HEMT器件。它可以通过包括一个50纳米厚的n富AlN层可以直接延伸到第C-极性4H-或6H-SiC衬底的生长。
研究方案
1.积液细胞斜坡和流量校准
- 确认液态氮的流向低温板和生长室已达到基本压力。
- 斜坡上升的喷射室到其光束通量测量(BFM)温度以1℃/秒的升温速率为Ga和在细胞中,并为铝10℃/分钟。等待细胞1小时,热稳定。
- 打开每个单元的快门为30-60秒,然后关闭快门1-2分钟。重复三次每个小区。丢弃第一束流离子规测量和平均后两种。调整电池温度根据先前通量/温度校准以获得所需的磁通。
2.基板制备和加载
- 易地基板清洗
- 负载开盒即用的N-极性GaN衬底直接,没有任何易地清洗。如果晶片被暴露在空气中更超过几个小时,冲洗下丙酮(30秒),异丙醇(30秒)和去离子(DI)水(60秒)。漂洗优选浸没在可能的,因为它往往留在晶片表面上更小的颗粒。
注:有关嘎极性GaN衬底建议更严格的表面的清洁23
- 负载开盒即用的N-极性GaN衬底直接,没有任何易地清洗。如果晶片被暴露在空气中更超过几个小时,冲洗下丙酮(30秒),异丙醇(30秒)和去离子(DI)水(60秒)。漂洗优选浸没在可能的,因为它往往留在晶片表面上更小的颗粒。
- 装载晶圆
- 关闭负载锁隔离闸阀,并用N 2通气。
- 装载在支架晶片和盒返回到负载锁定。打开负载锁定低真空泵,打开低真空泵阀和岐管阀。
- 当歧管压力已降至低于0.1乇,关闭歧管和低真空泵阀。关掉低真空泵和打开装载锁定涡轮泵隔离阀。
- 允许负载锁定抽空30-60分钟。理想情况下,使用10 -6 -10 -7托的负载锁定压力转移到准备室前。
- 打开负载锁定到制备腔室,并且使用摆动棒晶片传送到手推车。然后用台车到晶片在制备腔室传送到除气站。手动移动台车沿着上使用该准备容室的旋转穿通线的轨道。
- 脱气晶圆
- 斜坡除气站加热器温度到700℃历时10分钟。
- 30分钟后,递减的温度回落到100℃。当温度≤250℃,使用该摆动棒在除气站传送晶片返回到手推车。
- 负载晶片到生长室
- 降低基板操纵到装载位置,打开准备/生长室闸阀和晶片保持器传送到操纵器。
- 抬起手来生长部位,基底加热器附近。
- 取出小车和ClOSE闸阀。
- 打开N 2瓶头阀,调节阀和隔离针形阀。设置质量流量控制器(MFC)以1.5标准立方厘米(或根据需要以得到3-4×10 -5乇的室压力)。对于等离子点火的最佳压力是强烈依赖于系统。注意,N 2必须是超高纯度(大于6N优选更好)和一个附加滤波在线路用于进一步降低杂质。
- 与N *和主百叶窗关闭时,打开等离子体RF电源和自动匹配网络控制器。加大射频功率,直到血浆点燃。
- 设置RF功率和N 2流量为所需的工艺条件,在这种情况下,350瓦和2.0标准立方厘米。从给定的等离子体条件所产生的N *通量系统相关,但在这里,这些条件屈服的5.0纳米/分钟的GaN生长速度,或1.8纳米-2秒的N *通量-1。监控与连接到一台光谱仪的血浆稳定性等离子体室的后窗。
- 原位表面处理:嘎沉积和解吸
- 衬底加热器斜坡上升至10℃,高于所需的GaN生长温度与≤1℃/秒的升温速率。在这种情况下使用的730℃的估计晶片温度。
- 打开RHEED系统上观看的晶片表面的劣化和监测镓覆盖。手动打开基板转动。设置了触发RHEED采集软件每衬底旋转一次收集的RHEED图案同时衬底生长过程中旋转,以提供一个静态图像。
- 打开衬底快门和Ga快门1分钟。确保RHEED强度减小那么作为嘎积累达到平稳。 Ga束流的应类似于用于GaN生长。在此,Ga束流为大约3.7纳米-2秒-1。
- 关闭快门2分钟,并确保RHEED强度增加并达到2分钟结束前一个平台,表明嘎解吸。
- 重复步骤2.5.2-2.5.4三次,24然后斜衬底的GaN生长的温度。
3. HEMT增长
- 缓冲区增长
- 通过打开N *快门对于1分钟氮化开始生长。
- 通过打开铝快门长出薄薄的1-3纳米丰富的N- AlN成核层。此AlN层可以帮助防止穿透位错的产生,25然而,在AlN层复杂的X射线衍射(XRD)测量,不推荐基于XRD-校准样品。使用相同的Al磁通作为InAlN层,或约0.36纳米-2秒-1,给予大约为1纳米/分钟的生长速率。
- 关闭Al和N *快门和立即打开嘎快门10秒,让嘎饱和从表面上看,RHEED强度应减少RApidly。打开N *快门(以尕快门仍然打开),并增加5分钟的GaN。使用成为或C掺杂,特别是对独立GaN衬底,防止在缓冲漏电电流。
- 关闭Ga和N *百叶窗1分钟生长中断。监测RHEED强度。如果RHEED强度立即增大,则Ga束流不够高。如果RHEED强度> 30秒之后增加或没有达到1分钟内的高原则Ga束流的过高。参见图3。
- 增加几度基板温度(或减少镓喷射室温度),以补偿在3.1.4看到高镓通量。如果Ga的流量为过低,降低基板温度(或者增加Ga的喷射室温度)进行补偿。
- 重复步骤3.1.3-3.1.5,直到有一个15-30秒的延迟RHEED强度增加并且RHEED强度达到前1分钟的高原之前。
- 继续重复步骤3.1.4-3.1.5直到达到所需的GaN的厚度。由校准增长率乘以总的生长时间确定的厚度。对于富Ga生长,确定由N *通量,其可以反过来采用XRD测量为一个单独生长校准样品以已知的生长时间的厚度来计算的增长率。
- InAlN屏障增长
- 再等待1分钟,最后GaN生长步骤后,以确保所有嘎蒸发。
- 急剧下降到InAlN生长温度约为630℃。允许将基板温度稳定约2分钟。
- 打开In,Al和N *百叶窗。该RHEED强度应该减少与前3分钟内到达平台期。 RHEED强度的持续下降可以指示在积累,这是不利的InAlN增长。 RHEED图应保持条纹,表明表面光滑。我的n和铝通量约为0.31和0.36纳米-2秒-1,给予的1.25纳米/分钟III族有限的增长速度。
- 关闭在,Al和N *所需的阻挡层厚度后百叶窗已经达到。对于富的N-增长,确定由总III族流量的增长速度。测量使用一个单独生长InAlN校准样品的XRD的增长速度。对于使用这里给出的条件15nm的InAlN屏障,打开百叶窗12分30秒。
- 夹层和渠道增长
- 首先打开嘎快门5秒,然后打开N *快门和生长的GaN中间层。基板温度应该仍然在InAlN生长温度。
- 打开铝快门,无需关闭或Ga N *百叶窗成长的AlN的中间层。用于中间层的的Al通量应大于N *磁通相同或稍高,最好使用不同的Al渗出细胞然后与用于InAlN阻挡层,叔o避免不必更改电池温度。请参阅步骤3.2.4。
- 关闭N *和Al百叶窗,但离开嘎快门打开。坡道衬底温度达到GaN沟道温度。
- 30秒后关闭嘎快门。等待30秒(或者只要RHEED强度开始增加),并重新打开嘎快门。继续循环镓快门直到基板已达到GaN沟道生长温度。这将同时防止过度积累嘎保护表面。
- 打开嘎快门5秒,然后打开N *快门和成长GaN沟道。
- 关闭嘎,N *及主要百叶窗。坡道使基板温度下降到200℃,关掉N *等离子体和关闭的 N 2气流。
- 斜坡细胞下降到待机温度,如果完成的一天。
- 等待将衬底温度降低低于250℃,腔室压力下降到低于8×10 -7乇,然后打开生长室闸阀和晶片支架传送回手推车。
- 按照步骤2.2到晶片传送回负载锁定的反向,泄用N 2和取出晶片。确保生长室闸阀被打开负载锁定之前闭合,并且该负载锁定涡轮泵闸阀放空之前关闭。
- 按照步骤2.2.3-2.2.5到磁带盒和负载锁定回到高真空。
4.表征
- 利用光学显微镜来检查可能的渠道增长过程中形成的凹坑,裂纹或Ga液滴,XRD检查界面和结构质量,原子力显微镜来检查表面形貌表征材料的品质。20,21
- 如果Ga的液滴存在,沉浸在浓HF酸晶片5-10分钟以除去液滴而不损坏化学敏感N极性面。
- 测量表水库istance使用Lehighton的接触电阻的测量。
- 处理样品,让电器特性,包括大厅和CTLM测量,直流和射频晶体管特性。9,26
结果
X射线衍射(XRD)上生长图4中N极性GaN衬底所示InAlN薄膜的扫描(a)的单峰值都为50和200纳米厚的薄膜。 50纳米厚的薄膜InAlN的XRD扫描表现Pendellösung条纹高达15 阶 ,显示非常高的界面质量。 图4中的非对称倒易空间映射(b)示出了200nm厚InAlN层具有相同q‖,因此在同一平面内晶格常数为GaN衬底,指示用于一?...
讨论
高品质的GaN缓冲层的生长是在任何III族氮化物HEMT实现高电子迁移率的关键。在N极性InAlN HEMT的情况下,缓冲层生长是由所有镓从InAlN生长之前的表面去除的要求变得复杂。有各种技术,除了程序来完成此这里描述的,例如金属调制外延,27使用的生长条件在中间镓覆盖率和Ga液滴积累制度,28的边缘或允许连续N * -磁通掺入过量嘎当嘎快门被周期性关闭。24
披露声明
The authors have nothing to disclose.
致谢
The authors thank Mr. Neil Green for assistance with sample preparation. This work was supported by the Office of Naval Research under funding from Dr. P. Maki. MTH was supported by a National Research Council Postdoctoral Fellowship.
材料
| Name | Company | Catalog Number | Comments |
| Freestanding N-polar GaN wafer | Kyma | 10 mm x 10 mm | |
| C-polar SiC wafer | Cree | W4TRE0R-L600 | 3 inch diameter |
| Microelectronics grade acetone | Fischer Scientific | A18-4 | |
| Microelectronics grade isoproponal | J.T. Baker | 9079-05/JT9079-5 | |
| Al source material (6N5 pure) | UMC | ALR62060I | |
| Ga source material (7N pure) | UMC | GA701 | |
| In source material (7N pure) | UMC | IN750 | |
| ULSI N2 source gas (6N pure) | Matheson Tri-gas | G2659906D | |
| PRO-75 MBE system | OmicronScientia |
参考文献
- Hughes, W. C., et al. Molecular beam epitaxy growth and properties of GaN films on GaN/SiC substrates. J. Vac. Sci. Technol., B. 13 (4), 1571-1577 (1995).
- McSkimming, B. M., Wu, F., Huault, T., Chaix, C., Speck, J. S. Plasma assisted molecular beam epitaxy of GaN with growth rates 2.6 µm/hr. J. Cryst. Growth. 386, 168-174 (2014).
- Grandjean, N., Massies, J., Leroux, M. Nitridation of sapphire. Effect on the optical properties of GaN epitaxial overlayers. Appl. Phys. Lett. 69 (14), 2071-2073 (1996).
- Corrion, A. L., Wu, F., Speck, J. S. Growth regimes during homoepitaxial growth of GaN by ammonia molecular beam epitaxy. J. Appl. Phys. 112 (5), 054903 (2012).
- Mazumder, B., et al. Atom probe analysis of AlN interlayers in AlGaN/AlN/GaN heterostructures. Appl. Phys. Lett. 102 (11), 111603 (2013).
- Feezell, D. F., Speck, J. S., DenBaars, S. P., Nakamura, S. Semipolar (2021) InGaN/GaN Light-Emitting Diodes for High-Efficiency Solid State Lighting. J. Disp. Technol. 9 (4), (2013).
- Hardy, M. T., et al. True Green Semipolar InGaN-Based Laser Diodes Beyond Critical Thickness Limits Using Limited Area Epitaxy. J. Appl. Phys. 114 (18), 183101 (2013).
- Wong, M. H., et al. N-polar GaN epitaxy and high electron mobility transistors. Semicond. Sci. Technol. 28 (7), 074009 (2013).
- Hardy, M. T., et al. Charge control in N-polar InAlN high-electron-mobility transistors grown by plasma-assisted molecular beam epitaxy. J. Vac. Sci. Technol., B. 33 (6), 061207 (2015).
- Piquette, E. C., Bridger, P. M., Beach, R. A., McGill, T. C. Effect of Buffer Layer and III/V Ratio on the Surface Morphology of GaN Grown by MBE. Symposium G '-' GaN and Related Alloys. , (1998).
- Tarsa, E. J., et al. Homoepitaxial growth of GaN under Ga-stable and N-stable conditions by plasma-assisted molecular beam epitaxy. J. Appl. Phys. 82 (11), 5472-5479 (1997).
- Kuzmik, J. Power electronics on InAlN/(In)GaN: Prospect for a record performance. IEEE Electron Device Lett. 22 (11), 510-512 (2001).
- Fernández-Garrido, S., Gačević, &. #. 3. 8. 1. ;., Calleja, E. A comprehensive diagram to grow InAlN alloys by plasma-assisted molecular beam epitaxy. Appl. Phys. Lett. 93 (19), 191907 (2008).
- Katzer, D. S., et al. Molecular beam epitaxy of InAlN∕GaN heterostructures for high electron mobility transistors. J. Vac. Sci. Technol., B. 23 (3), 1204-1208 (2005).
- Kaun, S. W., et al. GaN-based high-electron-mobility transistor structures with homogeneous lattice-matched InAlN barriers grown by plasma-assisted molecular beam epitaxy. Semicond. Sci. Technol. 29 (4), 045011 (2014).
- Hoke, W. E., Torabi, A., Mosca, J. J., Kennedy, T. D. Thermodynamic analysis of cation incorporation during molecular beam epitaxy of nitride films using metal-rich growth conditions. J. Vac. Sci. Technol., B. 25 (3), 978-982 (2007).
- Koblmüller, G., Reurings, F., Tuomisto, F., Speck, J. S. Influence of Ga/N ratio on morphology, vacancies, and electrical transport in GaN grown by molecular beam epitaxy at high temperature. Appl. Phys. Lett. 97 (19), 191915 (2010).
- Zhou, L., Smith, D. J., McCartney, M. R., Katzer, D. S., Storm, D. F. Observation of vertical honeycomb structure in InAlN∕GaN heterostructures due to lateral phase separation. Appl. Phys. Lett. 90 (8), 081917 (2007).
- Ahmadi, E., et al. Elimination of columnar microstructure in N-face InAlN, lattice-matched to GaN, grown by plasma-assisted molecular beam epitaxy in the N-rich regime. Appl. Phys. Lett. 104 (7), 072107 (2014).
- Hardy, M. T., et al. Morphological and microstructural stability of N-polar InAlN thin films grown on free-standing GaN substrates by molecular beam epitaxy. J. Vac. Sci. Technol., A. 34 (2), 021512 (2016).
- Hardy, M. T., et al. Indium incorporation dynamics in N-polar InAlN thin films grown by plasma-assisted molecular beam epitaxy on freestanding GaN substrates. J. Cryst. Growth. 245, (2015).
- Leszczynski, M., et al. Indium incorporation into InGaN and InAlN layers grown by metalorganic vapor phase epitaxy. J. Cryst. Growth. 318 (1), 496-499 (2011).
- Storm, D. F., et al. Ultrathin-barrier AlN/GaN heterostructures grown by rf plasma-assisted molecular beam epitaxy on freestanding GaN substrates. J. Cryst. Growth. 380, 14-17 (2013).
- Storm, D. F., Katzer, D. S., Meyer, D. J., Binari, S. C. Oxygen incorporation in homoepitaxial N-polar GaN grown by radio frequency-plasma assisted molecular beam epitaxy: Mitigation and modeling. J. Appl. Phys. 112 (1), 013507 (2012).
- Storm, D. F., et al. Effect of interfacial oxygen on the microstructure of MBE-grown homoepitaxial N-polar. J. Cryst. Growth. 409, 14 (2014).
- Meyer, D. J., et al. High Electron Velocity Submicrometer AlN/GaN MOS-HEMTs on Freestanding GaN Substrates. IEEE Electron Device Lett. 34, 199 (2013).
- Moseley, M., Billingsley, D., Henderson, W., Trybus, E., Doolittle, W. A. Transient atomic behavior and surface kinetics of GaN. J. Appl. Phys. 106 (1), 014905 (2009).
- Koblmüller, G., et al. Ga Adlayer Governed Surface Defect Evolution of (0001)GaN Films Grown by Plasma-Assisted Molecular Beam Epitaxy. Jpn. J. Appl. Phys. 44 (28), L906-L908 (2005).
- Poblenz, C., Waltereit, P., Speck, J. S. Uniformity and control of surface morphology during growth of GaN by molecular beam epitaxy. J. Vac. Sci. Technol., B. 23 (4), 1379-1385 (2005).
转载和许可
请求许可使用此 JoVE 文章的文本或图形
请求许可探索更多文章
This article has been published
Video Coming Soon
版权所属 © 2025 MyJoVE 公司版权所有,本公司不涉及任何医疗业务和医疗服务。