Zum Anzeigen dieser Inhalte ist ein JoVE-Abonnement erforderlich. Melden Sie sich an oder starten Sie Ihre kostenlose Testversion.
Method Article
Charakterisierung von Oberflächenmodifikationen mittels Weißlicht-Interferometrie: Anwendungen in der Ion Sputtern, Laserablation, und Tribologie Experimente
In diesem Artikel
Zusammenfassung
Weiß Lichtmikroskop Interferometrie ist eine optische, berührungslose und schnelle Methode zur Messung der Topographie von Oberflächen. Es wird gezeigt, wie das Verfahren zur mechanischen Verschleiß Analyse, wo Narben auf tribologische Proben analysiert werden tragen können angewendet werden, und in den Materialwissenschaften zur Ionenstrahlsputtern oder Laserablation Volumen und Tiefe zu bestimmen.
Zusammenfassung
In Materialwissenschaften und Ingenieurwesen ist es oft notwendig, quantitative Messungen der Oberflächentopographie mit Mikrometer laterale Auflösung zu erhalten. Aus der gemessenen Oberfläche kann 3D topographische Karten anschließend analysiert werden mit einer Vielzahl von Software-Paketen, um die Informationen, die benötigt wird, zu extrahieren.
In diesem Artikel werden wir, wie Weißlicht-Interferometrie und optische Profilometrie (OP) in der Regel mit generischen Oberfläche Analyse-Software kombiniert beschreiben, können für Werkstoffkunde und Werkstofftechnik Aufgaben verwendet werden. In diesem Artikel werden eine Reihe von Anwendungen der Weißlicht-Interferometrie zur Untersuchung von Oberflächenmodifikationen in der Massenspektrometrie und Abnutzungserscheinungen in der Tribologie und Schmierung demonstriert. Wir charakterisieren die Produkte der Wechselwirkung von Halbleitern und Metallen mit energiereichen Ionen (Sputtern) und Laserbestrahlung (Ablation) sowie ex-situ Messungen der Verschleiß der tribologischen Probekörpern. Insbesondere werden wir diskutieren:
- Aspekte der traditionellen Ionenzerstäubung basierenden Massenspektrometrie wie Sputterraten / Ausbeuten Messungen an Si und Cu und nachfolgenden Zeit-zu-Tiefe-Konvertierung.
- Ergebnisse der quantitativen Charakterisierung der Wechselwirkung von Femtosekunden Laserbestrahlung mit einer Halbleiter-Oberfläche. Diese Ergebnisse sind für Anwendungen wie Ablation Massenspektrometrie, wobei sich die Mengen des verdampften Materials untersucht und kann über Pulsdauer und Energie pro Impuls gesteuert werden wichtig. Somit kann durch die Bestimmung der Geometrie ein Krater definieren Tiefe und seitliche Auflösung gegenüber Versuchsaufbau Bedingungen.
- Messungen der Oberflächenrauhigkeit Parameter in zwei Dimensionen und quantitative Messungen der Oberfläche tragen, die als ein Ergebnis von Reibung und Verschleiß auftreten Tests.
Einige inhärente Nachteile, mögliche Artefakte und Unsicherheit Einschätzungen des weißen LichtsInterferometrie Ansatz wird diskutiert und erläutert werden.
Einleitung
Die Oberfläche von festen Materialien bestimmt in hohem Maße interessierenden Eigenschaften für diese Materialien: elektronisch, strukturell und chemisch. In vielen Bereichen der Forschung, die Zugabe von Material (zB Dünnschicht Abscheidung durch gepulste Laser / Magnetronsputtern Abscheidung, physikalischer / chemischer Gasphasenabscheidung), Entfernen von Material (Reactive Ion Etching, Ionenzerstäubung, Laserablation, etc.), oder einige andere Verfahren müssen charakterisiert werden. Darüber hinaus hat Oberflächenmodifizierung durch Interaktion mit energetischen Lichtpulse oder geladenen Teilchen eine Vielzahl von Anwendungen und ist von fundamentalem Interesse. Tribologie, die Studie von Reibung und Verschleiß, ist ein weiterer Bereich von Interesse. Auf einem Tisch Maßstab, gibt es eine Vielzahl von tribologischen Testgeometrien. Nicht-konformen Kontakt Geometrien können verwendet werden, und eine Kugel oder Zylinder sein kann geschoben oder gedreht gegen eine ebene Fläche, eine andere Kugel oder der Zylinder, für eine Zeitdauer und die Menge des Materials, das entfernt wird, ist mirgesicherter. Weil die Verschleißnarbe ist dreidimensional und unregelmäßig in der Natur können optische Profilometrie die einzige Technik geeignet zum Erhalten genauer Verschleißvolumen Messungen. Gemeinsame Analyse Aufgaben gehören auch Oberflächenrauhigkeit Parametern, Stufenhöhe, Materialverlust Volumen, Grabentiefe, und so weiter, alle von ihnen können zusätzlich zu einfachen 2D-und 3D-Visualisierung Topographie erhalten werden.
Optische Profilometrie bezieht sich auf jede optische Methode, mit der das Profil der Oberfläche rekonstruiert wird. Profilometrische Verfahren schließen weißes Licht Interferometrische Laser oder konfokalen Methoden. Einige optische Profilometer erhalten Informationen über Ansätze, die auf konventionellen beugungsbegrenzte Mikroskop Ziele. Zum Beispiel kann ein Laser-Scanning-Mikroskop mit einem topographischen und wahre Farbinformationen Oberflächen zu erhalten integriert werden. Ein zweites Verfahren verwendet eine Technik, die die extrem kleinen Tiefenschärfe des herkömmlichen Ziele ausnutzt, um eine ernst zusammenzubauenn der In-Fokus "Bildscheiben" der Oberfläche, um ein 3D topographische Karte zu erhalten.
In dieser Arbeit wird gezeigt, wie ein weißes Licht interferometrischen Mikroskop / Profilometer die Messung der Menge an Material während der mechanischen Verschleiß Prozesse verloren ermöglicht, oder während Material Ätzverfahren wie Ionenzerstäubung Krater oder Laserablation. Die größte Aufmerksamkeit gilt der Methodik dieser Methode gezahlt seiner großen installierten Kapazität, die es überall verfügbar und attraktiv für eine Vielzahl von Anwendungen ermöglicht illustrieren. Die meisten Arten von WLI beschäftigen die Mirau Technik, die einen Spiegel verwendet interne zum Mikroskopobjektiv, um Interferenzen zwischen einem Bezugs-Lichtsignal und dem reflektierten Licht von der Probenoberfläche zu bewirken. Die Wahl des Mirau Interferometrie wird durch einfache Bequemlichkeit diktiert, weil die gesamte Mirau Interferometer innerhalb des Mikroskopobjektivlinse angepasst werden können und mit einem regelmäßigen optischen Mikroskop (Abbildung 1). Eine Serie von zweidimensionalen interferograms sind mit einer Videokamera aufgenommen, assembliert und Software ein 3D topographische Karte. Der weiße Lichtquelle liefert breites Spektrum Beleuchtung, die die "fringe Ordnung" Mehrdeutigkeit einer monochromatischen Quelle überwinden hilft. Eine monochromatische Lichtquelle verwendet werden, um eine genauere Messung der flachen topographische Merkmale zu erhalten. Die laterale Auflösung grundlegend mit λ / 2 (numerische Apertur, NA = 1) begrenzt, aber in den meisten Fällen größer ist, wobei die NA des Objektivs, die wiederum verbunden ist, um die Vergrößerung / field-of-view Größe bestimmt. Tabelle 1 in Lit.. 1 hat einen direkten Vergleich aller genannten Parameter. Tiefenauflösung Ansätze ≈ 1 nm, eine Funktion der interferometrischen Natur der Technik. Weitere Informationen zu Mirau WLI in Refs gefunden werden. 2, 3. Eine Einführung auf weißem Licht interferometrischen Ansatz kann in Ref gefunden werden. 4.
Andere Verfahren zur Analyse von Oberflächen sind atomare force-Mikroskopie (AFM), Rasterelektronenmikroskopie (SEM) und Stylus Profilometrie. Das Verfahren vergleicht WLI günstigerweise auf diese Verfahren und hat seine eigenen Vorteile und Nachteile, die aufgrund der optischen Art des Verfahrens sind.
Die AFM kann Erlangung von 3D-Bildern und somit entsprechende Querschnitte, sondern hat nur eine begrenzte AFM Scan-Fähigkeit in den seitlichen (<100 um) und Tiefe (<10 um) Achsen. Im Gegensatz zu diesen ist der Hauptvorteil der WLI die flexible field-of-view (FOV) von bis zu wenigen Millimetern bei gleichzeitiger echte 3D-Imaging-Fähigkeit. Darüber hinaus zeigen wir, wie es hat breite vertikale Abtastbereich Kapazität, so dass man eine Vielzahl von Problemen der Oberflächenmodifizierung einfach lösen. Forscher, die mit AFM gearbeitet haben, sich des Problems bewusst mit dem Flugzeug Positionierung einer Probe bei der Messung längerer Merkmale der geringen vertikalen Gradienten. Generell kann eine WLI / OP als "express"-Technik über AFM denken. Natürlich gibt eseine Reihe von Bereichen, für die nur AFM eignet: wenn seitliche Funktionen zu lösen gilt charakteristischen Abmessungen kleiner ist als die laterale Auflösung WLI, oder Fälle, in denen Daten von WLI mehrdeutig ist aufgrund unbekannter oder komplexen optischen Eigenschaften einer Probe in einer Weise, dass beeinflusst die Genauigkeit der Messungen (die später diskutiert werden), etc.
Die SEM ist eine leistungsfähige Methode, um Oberflächen aussehen, sehr flexibel in Bezug auf die FOV Größe mit großen Tiefenschärfe, größer als alle herkömmlichen optischen Mikroskops bieten kann. Gleichzeitig ist 3D-Bildgebung durch SEM umständlich, insbesondere da es unter der Stereo-Paar Bilder, die dann durch die 3D-Bilder anaglyphic Verfahren umgewandelt werden, oder durch Beobachtung mit optischen Betrachtern oder eingesetzt zur direkten Berechnung der Tiefen zwischen verschiedenen erfordert Punkte des Interesses an einer Probe. 5 Im Gegensatz dazu bietet WLI / OP Profilometrie easy-to-use 3D-Rekonstruktion bei gleichzeitig flexible FOV. WLI scannt durch die vollständigeHöhenbereich für die jeweilige Probe benötigt (von Nanometern bis mehreren hundert Mikrometern). WLI ist unbeeinflusst von der elektrischen Leitfähigkeit des Probenmaterials, was ein Problem mit SEM sein kann. WLI eindeutig erfordert kein Vakuum. Auf der anderen Seite gibt es eine Reihe von Anwendungen, für die SEM bietet überlegene Informationen: seitlichen Funktionen der charakteristischen Abmessungen unterhalb des lateralen Auflösung von WLI oder Fällen behoben werden, wo verschiedene Teile einer Probe topographisch unterschieden werden können, wenn nur Sekundärelektronen-Emissionskoeffizienten unterscheiden.
Eine weitere Technik zur Oberflächeninspektion, die weit in Sekundärionen-Massenspektrometrie 6 und im Bereich der mikroelektromechanischen Systemen Charakterisierung 7 verwendet ist Stift Profilometrie. Diese Technik ist wegen seiner Einfachheit und Robustheit beliebt. Es basiert auf direkten mechanischen Kontakt Abtastung einer Tastspitze über die Probenoberfläche basiert. Dies ist eine grobe Kontakt-Tool, Welches in der Lage ist abzutasten entlang einer einzigen Linie zu einer Zeit. Es macht 3D-Oberflächen-Raster-Scan-Bildgebung extrem zeitaufwendig. Ein weiterer Nachteil des Taststiftes Technik ist die Schwierigkeit des Messens Oberflächenmerkmale hohen Seitenverhältnis und der Größe vergleichbar mit der charakteristischen Größe der Spitze (Submikron bis zu mehreren Mikrometern typischerweise), die einen Radius und eine Spitze Scheitelwinkel impliziert. Ein Vorteil der Stift Profilometrie ist seine Unempfindlichkeit gegenüber unterschiedlichen optischen Eigenschaften einer Probe, die die Genauigkeit der WLI / OP-Messungen (wird später besprochen) beeinflussen können.
Die Oberfläche Karten im vorliegenden Artikel wurden unter Verwendung eines herkömmlichen Mirau-Typ WLI (Abbildung 1). Viele Unternehmen wie Zygo, KLA-Tencor, Nanowissenschaften, Zemetrics, Nanovea, FRT, Keyence, Bruker und Taylor Hobson produzieren kommerziellen Tisch-OP-Instrumente. Die erfassten Karten wurden rekonstruiert und unter Verwendung kommerzieller Software der Art, die üblicherweise zur WLI, Scanning Electron, o verwendet wirdr-Sonden-Mikroskopie. Die Software hat die Fähigkeit, mathematische Manipulationen an der Oberfläche durchzuführen, Querschnittsprofil Analyse, ungültig und Materialvolumen Berechnungen und Ebene-Korrektur. Andere Software-Pakete automatisieren einige dieser Funktionen.
Access restricted. Please log in or start a trial to view this content.
Protokoll
Ein. Hardware Alignment für General WLI Scan
Um quantitative Informationen über WLI erhalten, können die folgenden Schritte als Richtlinie dienen. Es wird angenommen, dass der Bediener Grundkenntnisse Interferometer Operation hat. Die Richtlinien sind häufig unabhängig von der jeweiligen Instrument. Bei einigen Untersuchungen wird die Probe flach sein. Für andere kann die Probe gebogen sein.
- Legen Sie die Probe auf der Bühne mit dem Feature (Ionen gesputtert Krater, Ionenstrahl / abgetragenen Stelle, oder tragen Narbe) nach gerade nach oben. Verwenden Sie eine niedrige vergrößerndes Objektiv und fokussieren Sie das Gerät auf sie. Für beste Auflösung zu erhalten ein Bild, in dem das Objekt des Interesses weitgehend füllt den Bildschirm, siehe Abbildung 2 zeigt ein Beispiel für eine Kugel.
- Einstellen der vertikalen Position der Probe, so dass Interferenzstreifen in der Nähe des interessierenden Merkmals angezeigt. Für eine ebene Fläche ist es wünschenswert, dass die Probe geneigt ist, daß die Ebene ist perpendicular zur optischen Achse, dh der Streifenabstand groß sein wird. Für eine gekrümmte Oberfläche (zB eine Kugel), sollte die Probe so orientiert sein, dass die Fransen zentral um die Funktion befindet, wie in 3.
- Besorgen Sie sich einen Scan nach den Geräteanleitung. Es kann notwendig sein, um die Beleuchtungs-oder Scan Höhe einzustellen, um das beste topographische Karte zu erhalten. Füllen Sie die fehlerhafte oder fehlende Daten über die Interpolation Funktion und speichern Sie dann die topographische Karte.
2. Volume Analysis Using Generic Software
In der Tribologie, Prüfmaschinen verwenden oft nicht-konformen Kontakt Testen Geometrien wie beispielsweise eine Kugel oder ein Zylinder, verschoben oder gedreht wird, gegen eine ebene oder eine andere Zylinder. Typischerweise wird das Material an der Stelle der Gleitberührung verloren, obwohl manchmal Material von einer Oberfläche zur anderen übertragen kann, und diese "Übertragungslage" wird ein Überschuss von Material auf über messendene der Kontaktierung Proben. Weil die Verschleißnarbe ist dreidimensional und unregelmäßig in der Natur können optische Profilometrie die einzige Technik geeignet zum Erhalten genauer Verschleißvolumen Messungen sein - Näherungen sind ungültig. Das Ziel besteht darin, die sehr geringe Mengen an Material, das verloren gehen (oder gewonnen) im Kontaktierungsbereich werden kann bei der Beendigung eines Tests zu messen.
Das Grundprinzip der Messung ist, eine mathematische Ebene auf der Ebene der ungestörten Oberfläche zu definieren: Oberflächenanalyse Software annimmt, dass es einen "festen Oberfläche" (Null-Pegel), was über diesem Niveau "leer". Die Analyse-Funktion, die den integrierten Volumen misst entfernt unterhalb der Ebene der "festen Oberfläche" wird hiernach als "Hohlraumvolumen". Die Funktion, die integrierte Volumen oberhalb der Ebene der "festen Oberfläche" (zB eine Ansammlung von Schmutz) misst wird als "Materialvolumen" werden.
Echte ungestörten Flächen are selten ganz glatt und flach. Für die größte Genauigkeit bei der Messung kleiner Merkmale ist es gute Praxis, um einen Bereich von Interesse (AOI) definieren; der Bereich außerhalb von denen aus der Analyse ausgeschlossen. Die AOI wird verwendet, um den Messbereich einzuschränken, da Unregelmäßigkeiten in der Oberfläche Zusatzvolumen tragen zu den Berechnungen, die nicht wirklich aus dem Störbereich.
3. Flache Surface - Mechanische Wear Analysis
- Band Analyse einer flachen Oberfläche mit einem Graben Narbe oder Depression, sei es durch mechanische Abnutzung, Ionenstrahlsputtern, Laserablation oder erzeugt wird, ist einfach durchzuführen. Erhalten Sie ein Bild wie in Abbildung 4 links, die eine mechanische Narbe auf einer polierten Edelstahl Oberfläche zeigt. Wählen Sie ein AOI, die die Depression schließt und dann verwenden, was Neigung und / oder Krümmung Entfernen-Funktion zur Verfügung, um die ungestörte Oberfläche, um maximale Planheit Ebene ist. Dann nutzen Sie die Software, um die durchschnittliche Oberflächentemperatur Höhe Z = gesetzt0. Abbildung 4 rechts ist ein Pseudo Ansicht einer Narbe auf einer ebenen Fläche nach diesen Schritten. In dieser Ansicht ist die Ausgeschlossenen "Hohlraumvolumen" ist rot eingefärbt. In diesem Farbschema bezeichnet die dunkelbraune niedrigen Bereichen, während Orange steht für hohe Bereiche.
- Löschen Sie die AOI. Wenn die Software eine automatisierte Volumen Messfunktion, legen Sie eine Region der Messung über die Narbe. In dieser Software wird die Messfunktion tally die "void und Material Band" mit blauer Tönung in Abbildung 5 dargestellt. Insgesamt Verschleiß "Material Band" oberhalb der Ebene subtrahiert "Hohlraumvolumen." Dies ist die Volumenänderung der gestörte Oberfläche. (Für Software, die nicht über diese Funktion, aber ein Histogramm haben, oder klar zu visualisieren, welche Bereiche über der Oberfläche angehoben oder unterhalb der Oberfläche, überspringen Sie Schritt 3,2 und gehen bis 3,3 fort.)
Die folgenden drei Schritte beschreiben ein alternatives Verfahren zum Messen Verschleißvolumen.
- Kehren Sie die AOIvon Schritt 3,1, damit die Narbe Region analysiert (die Narbe ist jetzt im Lieferumfang enthalten).
- Generieren eines Histogramms von den Daten. Das Histogramm ist eine graphische Darstellung der vertikalen Höhe auf der Abszisse gegen die Häufigkeit des Auftretens auf der Ordinate. Setzen Sie einen Cursor auf der Z = 0-Stellung (Abbildung 6 links). Dies kann nicht an der Spitze des Histogramms ist. In dieser Figur ist die Cursor wurden bis selektiv analysieren nur das fehlende Material unterhalb der Ebene gesetzt. Die Software integriert das Gesamtvolumen zwischen den beiden Cursorn. Die rote getönte Bereich zeigt, was weggelassen wird. Die orange ungefärbten Bereiche in Abbildung 6 rechts unterhalb der Oberfläche. Das Histogramm Funktion sollte erzeugen einen "Hohlraumvolumen"-Nummer mit den Cursor positioniert ist, wie gezeigt, um das Material von der Oberfläche verloren messen.
- Mit der gleichen Histogramm, platzieren Sie den anderen Cursor diesmal am Z = 0 Höhenposition (Abbildung 7 links), und der andere auf der gegenüberliegenden Seite. Die orange ungefärbten Bereichen Abbildung 7 rechts sind über der Oberfläche. Die Histogramm-Funktion sollte eine "wesentliche Volumen" zu generieren, hob dh überschüssige Material oberhalb der flachen Oberfläche. Insgesamt Verschleiß "Material Band" subtrahiert "Hohlraumvolumen," das gleiche wie in Schritt 3.2. Das Histogramm Methode sollte das gleiche Verschleißvolumen wie in Schritt 3.2, aber es stellt zusätzliche Angaben über die Verteilung der angehoben und abgesenkt Material und zeigt eine Karte der Verteilung der diesem Bereich.
Im obigen Beispiel gibt es keine Netto-Material aus dem Verschleißnarbe verloren, stattdessen gibt es materiellen Gewinn. Das ist ungewöhnlich, aber manchmal geschieht, wenn das Material überträgt von einem Test Gegenfläche zum anderen.
Die gleichen "flache Oberfläche Charakterisierung" Ansätze sind vorteilhaft zur Erzielung Volumina in Experimenten mit Ionenzerstäubung und Laserablation, in den folgenden Beispielen als entfernt.
4. Flache Surface - Krater und Ion Beam ProDateien Maße zu schätzen Sputterausbeute, und Time-to-Tiefe Kalibrierung durchführen
Als Alternative zu den bekannten und weithin angewandte Methode zur Schätzung Sputtern Ausbeuten unter Verwendung von Massen-Verlust-Methode, auf direktes Wiegen oder Quarz Mikrokristall Balance, 8, 9 finden wir, dass die WLI Methode nützlich ist für die direkte Visualisierung der Basis von gesputterten Ionenstrahl Spots / Krater durch statische Sputtern / Rasterabtastung eines Ionenstrahls. Abbildung 8 erhaltenen vergleicht longitudinalen Querschnitte eines Flecks (grüne und blaue Feststoff gestrichelt) eines senkrecht einfallenden statischen 5 keV und 150 eV Ar + Ionenstrahlen gegen ihren Kratern (Oliven offenen Kreisen und Cyan offene Rauten) von 100 × 100 Pixel digitale Rasterabtastung des gleichen Ionenstrahls über die Oberfläche einer Cu (110)-Einkristall erhalten wird. Die Kurve entsprechend den statischen Strahl überlappt einer Kante des Kraters zu demonstrieren, wie Rasterabtastung der Ionenstrahl den Krater erzeugt im Sputter diefe Profilierung.
5. Ebenen Fläche - Charakterisierung von Ultrafast Laser Ablation
Ultraschnelle Laser-Ablation als ein Verfahren zum Entfernen von Material von einem festen gleichzeitiger Minimierung der Wärmeeinflusszone anerkannt. 10 Dieses Verfahren ermöglicht hohe Mikrobearbeitung mit hohen Seitenverhältnissen und minimale Schäden (Risse, Oxidation) mit dem übrigen Material und die Möglichkeit eröffnet, effizienter Ablation von transparenten Materialien. 11 In jüngerer Zeit hat das Interesse an den ultraschnellen Ablation als analytisches Werkzeug entwickelt. 12-15 Die hohe Nichtlinearität des Ablationsverfahren stellt auch ein Mittel zur Reduzierung der abgetragenen Fleckgröße deutlich unter dem bestrahlten Fleckgröße ( wie sie typischerweise von 1 / e 2) definiert ist und auch unterhalb der Beugungsgrenze, wie nachgewiesen wurde. 16 Tiefenauflösung, während nicht wettbewerbsfähig mit den besten Ionenstrahl Methoden kann <20 nm betragen. Abtragsraten kann leicht erhöht werdennichtlinear durch Erhöhen der Laserfluenz, ist, so dass sehr schnelle Profilierung durch Mikrometer Material möglich. Idealerweise Charakterisierung Materialabtrag durch ultraschnelle Ablation erfordert eine Technik, die eine schnelle und quantitative und gut kalibriert ist, alle Merkmale von WLI erfüllt.
Abbildung 9 zeigt Pseudocolor Bilder von zwei benachbarten Krater durch repetitive Ablation von GaAs mit einem ultraschnellen (60 fs, 800 nm) Laserstrahl fokussiert, um eine Punktgröße von ≈ 8 um und mit Fluenzen entsprechend 0,4 und 1,0 J / cm 2. Gebildet
6. Curved Surfaces - Mechanische Wear Analysis
Band Analyse einer gekrümmten regelmäßigen Oberfläche (Kugel oder Zylinder) ist ähnlich dem eines flachen, aber erfordert Krümmung Entfernung. Das folgende Protokoll zeigt eine Analyse eines kreisförmigen Verschleißnarbe auf einer Stahlkugel. Um die Lautstärke von einem Ball verloren zu finden, ist es notwendig, mathematische Verarbeitung zu tun, um einen Ball mit einer Transformationebene Fläche in einer flachen Ebene mit einer Vertiefung, dann messen die Lautstärke der Vertiefung wie in Abschnitt 3 auf ebenen Flächen erfolgen. Verschleißanordnung Narbe auf einer Kugel gemessen werden, unter Verwendung des ersten einfachere automatische Technik, dann mit dem Histogramm-Technik.
- Abbildung 10 links zeigt eine isometrische Ansicht eines Verschleißnarbe auf einer Kugel. Wählen Sie ein AOI Das schließt den Verschleiß Narbe, und wählen Sie die Software Kurvenanpassung Tool, das die Oberfläche verändern wird, so dass es eine abgenutzte Vertiefung in der Mitte eines ungestörten ebene Fläche ist. Weil Krümmung Entfernung kann eine iterative Technik kann es erforderlich sein, um die Passform mehrmals, so dass der ungestörten Bereich flach an Pegelgenauigkeit nm wird ausgeführt. Jede sichtbare Uneinheitlichkeit außerhalb des Verschleißnarbe weist auf ein Problem und die Berechnung nicht korrekt sein. Stellen Sie die durchschnittliche Höhe außerhalb der Narbe Z = 0 ist. Abbildung 10 rechts zeigt eine Pseudo Angesichts der Narbe nach Krümmung Entfernung und Einstellung Z = 0 mit einem AOI richtigMaskierung des abgenutzten Bereich.
- Verwenden des Messwerkzeugs, wenn verfügbar, um den Verschleiß, wie in 11 gezeigt analysiert werden. Insgesamt Verschleiß Volumen "Material Band" aus dem subtrahiert "Hohlraumvolumen."
Die folgenden Schritte beschreiben eine alternative Methode zur Messung der Verschleiß Volumen.
- In der gleichen Weise wie in Schritt 3.3, kehren die AOI so dass der Verschleiß Narbe ist enthalten. Generieren eines Histogramms von den Daten. Setzen Sie einen Cursor auf der Z = 0-Stellung (Abbildung 12 links). Die orange ungefärbten Bereiche in Abbildung 12 rechts unterhalb der Oberfläche. Die Histogramm-Funktion sollten einen "void volume"-Nummer.
- Mit der gleichen Histogramm, platzieren Sie den anderen Cursor diesmal am Z = 0 Höhenposition (Abbildung 13 links), und der andere auf der gegenüberliegenden Seite. Die orange ungefärbten Bereiche in Abbildung 13 rechts sind über der Oberfläche. Die Histogramm-Funktion generieren soll eine "wesentliche volume"-Nummer. GesamtVerschleißvolumen ist "Materialvolumen" oberhalb der Ebene aus "Hohlraumvolumen", die gleiche wie in Schritt 3,2 subtrahiert. Das Histogramm berechnen Methode sollte die gleiche Verschleißvolumen wie in Schritt 6.2, aber es stellt zusätzliche Angaben über die Verteilung der angehoben und abgesenkt Material und zeigt eine Karte der Verteilung der diesem Bereich.
Access restricted. Please log in or start a trial to view this content.
Ergebnisse
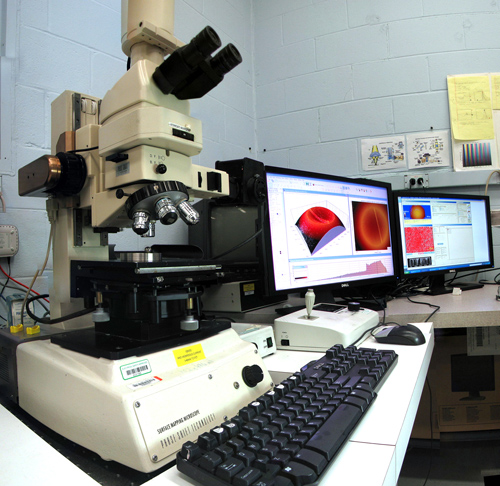
Abbildung 1 Foto von einem einfachen Profilometer in der vorliegenden Studie verwendet:. Ein Vielfaches Objektivrevolver ist im Bild zu sehen. Zwei Ziele sind Standard (10x und 50x), und zwei sind Mirau Ziele (10x und 50x). Dieses Mikroskop ist ein Zwischenprodukt Vergrößerungsfunktion, die schrittweise Vergrößerung Multiplikatoren von 0,62, 1,00, 1,25 oder 2,00 aus...
Access restricted. Please log in or start a trial to view this content.
Diskussion
Beispiel 1
WLI ist nicht weit zur Charakterisierung von Oberflächen in tribologischen Arbeit verwendet, aber es ist in der Tat eine leistungsfähige Methode zur quantitativen Messung der Verschleiß Volumen für viele Kontakt-Geometrien. WLI produziert ein komplettes 3D-Darstellung der Oberfläche, die unter Verwendung eines von mehreren Visualisierung Software-Pakete werden können. Diese Pakete ermöglichen verschiedene Arten von Messungen durchgeführt werden. Für eine größere laterale A...
Access restricted. Please log in or start a trial to view this content.
Offenlegungen
Keine Interessenskonflikte erklärt.
Danksagungen
Die bestrahlte GaAs-Probe wurde von Yang Cui von der Universität von Illinois in Chicago zur Verfügung gestellt. Diese Arbeit wurde im Rahmen des Vertrages unterstützt Nr. DE-AC02-06CH11357 zwischen UChicago Argonne, LLC und dem US Department of Energy und der NASA durch Zuschüsse NNH08AH761 und NNH08ZDA001N, und das Amt des Vehicle Technologies des US Department of Energy unter Vertrag DE-AC02 -06CH11357. Die Elektronenmikroskopie wurde am Electron Microscopy Center for Materials Research am Argonne National Laboratory, ein US-Department of Energy Office of Science Labor, unter Vertrag DE-AC02-06CH11357 durch UChicago Argonne, LLC betrieben durchgeführt.
Access restricted. Please log in or start a trial to view this content.
Materialien
| Name | Company | Catalog Number | Comments |
| Einkristallsubstrate Si, GaAs und Cu | zum Sputtern und Ablation | ||
| Reine Metalllegierungen | für Tribologie Beispiele |
Referenzen
- Gao, F., Leach, R. K., Petzing, J., Coupland, J. M. Surface measurement errors using commercial scanning white light interferometers. Meas. Sci. Technol. 19, 015303(2008).
- Cheng, Y. -Y., Wyant, J. C. Multiple-wavelength phase-shifting interferometry. Appl. Opt. 24, 804-807 (1985).
- Kino, G. S., Chim, S. S. C. Mirau correlation microscope. Appl. Opt. 29, 3775-3783 (1990).
- Wyant, J. C. White light interferometry. Proc. SPIE. 4737, 98-107 (2002).
- Sakseev, D. A., Ershenko, E. M., Baryshev, S. V., Bobyl, A. V., Agafonov, D. V. Deep microrelief measurement and stereo photography in scanning electron microscopy. Tech. Phys. 56, 127-131 (2011).
- Morris, R. J. H., Dowsett, M. G. Ion yields and erosion rates for Si1-xGex (0≤x≤1) ultralow energy O2+ secondary ion mass spectrometry in the energy range of 0.25-1 keV. J. Appl. Phys. 105, 114316(2009).
- O'Mahony, C., Hill, M., Brunet, M., Duane, R., Mathewson, A. Characterization of micromechanical structures using white-light interferometry. Meas. Sci. Technol. 14, 1807-1814 (2003).
- Andersen, H. H., Bay, H. L. Sputtering yield measurements. Topics in Applied Physics. Behrisch, R. 47: Sputtering by Particle Bombardment, Springer-Verlag. Berlin, Heidelberg. 145-218 (1981).
- Wu, S. -M., de Kruijs, R. van, Zoethout, E., Bijkerk, F. Sputtering yields of Ru, Mo, and Si under low energy Ar+ bombardment. J. Appl. Phys. 106, 054902(2009).
- Liu, X., Du, D., Mourou, G. Laser ablation and micromachining with ultrashort laser pulses. IEEE J. Quantum Electron. 33, 1706-1716 (1997).
- Gattass, R. R., Mazur, E. Femtosecond laser micromachining in transparent materials. Nature Photonics. 2, 219-225 (2008).
- Russo, R. E., Mao, X., Gonzalez, J. J., Mao, S. S. Femtosecond laser ablation. ICP-MS. J. Anal. At. Spectrom. 17, 1072-1075 (2002).
- Brady, J. J., Judge, E. J., Levis, R. J. Analysis of amphiphilic lipids and hydrophobic proteins using nonresonant femtosecond laser vaporization with electrospray post-ionization. J. Am. Soc. Mass Spectrom. 22, 762-772 (2011).
- Berry, J. I., Sun, S., Dou, Y., Wucher, A., Winograd, N. Laser desorption and imaging of proteins from ice via UV femtosecond laser pulses. Anal. Chem. 75, 5146-5151 (2003).
- Coello, Y., Jones, A. D., Gunaratne, T. C., Dantus, M. Atmospheric pressure femtosecond laser imaging mass spectrometry. Anal. Chem. 82, 2753-2758 (2010).
- Korte, F., Serbin, J., Koch, J., Egbert, A., Fallnich, C., Ostendorf, A., Chichkov, B. N. Towards nanostructuring with femtosecond laser pulses. Appl. Phys. A. 77, 229-235 (2003).
- Fu, Y., Bryan, N. K. A., Shing, O. N., Wyan, H. N. P. Influence analysis of dwell time on focused ion beam micromachining in silicon. Sensors and Actuators A. 79, 230-234 (2000).
- Jiang, F., Li, J., Yan, L., Sun, J., Zhang, S. Optimizing end-milling parameters for surface roughness under different cooling/lubrication conditions. Int. J. Adv. Manuf. Technol. 51, 841-851 (2010).
- Reiter, A. E., Mitterer, C., Figueiredo, M. R., Franz, R. Abrasive and adhesive wear behavior of arc-evaporated Al1-xCrxN hard coatings. Tribol. Lett. 37, 605-611 (2010).
- Devillez, A., Lesko, S., Mozer, W. Cutting tool crater wear measurement with white light interferometry. Wear. 256, 56-65 (2004).
- Shekhawat, V. K., Laurent, M. P., Muehleman, C., Wimmer, M. A. Surface topography of viable articular cartilage measured with scanning white light interferometry. Osteoarthritis and Cartilage. 17, 1197-1203 (2009).
- Hershberger, J., Öztürk, O., Ajayi, O. O., Woodford, J. B., Erdemir, A., Erck, R. A., Fenske, G. R. Evaluation of DLC coatings for spark-ignited, direct-injected fuel systems. Surf. Coat. Technol. 179, 237-244 (2004).
- Ajayi, O. O., Erck, R. A., Lorenzo-Martin, C., Fenske, G. R. Frictional anisotropy under boundary lubrication: Effect of surface texture. Wear. 267, 1214-1219 (2009).
- Wittmaack, K. Analytical description of the sputtering yields of silicon bombarded with normally incident ions. Phys. Rev. B. 68, 235211-23 (2003).
- Zeuner, M., Neumann, H., Scholze, F., Flamm, D., Tartz, M., Bigl, F. Characterization of a modular broad beam ion source. Plasma Sources Sci. Technol. 7, 252-267 (1998).
- Barna, A., Menyhard, M., Kotis, L., Kovacs, G. J., Radnoczi, G., Zalar, A., Panjan, P. Unexpectedly high sputtering yield of carbon at grazing angle of incidence ion bombardment. J. Appl. Phys. 98, 024901(2005).
- Weck, A., Crawford, T. H. R., Wilkinson, D. S., Haugen, H. K., Preston, J. S. Laser drilling of high aspect ratio holes in copper with femtosecond, picosecond and nanosecond pulses. Appl. Phys. A. 90, 537-543 (2008).
- Roosendaal, H. E. Sputtering yields of single crystalline targets. Topics in Applied Physics. ed, I. .,B. ehrisch,R. ., 47: Sputtering by Particle Bombardment, Springer-Verlag. Berlin, Heidelberg. 219-256 (1981).
- Seah, M. P. An accurate semi-empirical equation for sputtering yields II: For neon, argon and xenon ions. Nucl. Instrum. Methods Phys. Res. B. 229, 348-358 (2005).
- Seah, M. P., Clifford, C. A., Green, F. M., Gilmore, I. S. An accurate semi-empirical equation for sputtering yields I: For argon ions. Surf. Interface Anal. 37, 444-458 (2005).
- James Ziegler - SRIM & TRIM [Internet]. , Available from: http://www.srim.org/ (2011).
- Moller, W., Eckstein, W. Tridyn - A TRIM simulation code including dynamic composition changes. Nucl. Instrum. Methods Phys. Res. B. 2, 814-818 (1984).
- Insepov, Z., Norem, J., Veitzer, S. Atomistic self-sputtering mechanisms of rf breakdown in high-gradient linacs. Nucl. Instrum. Methods Phys. Res. B. 268, 642-650 (2010).
- Puech, L., Dubarry, C., Ravel, G., de Vito, E. Modeling of iron oxide deposition by reactive ion beam sputtering. J. Appl. Phys. 107, 054908(2010).
- Ho, S., Tamakoshi, T., Ikeda, M., Mikami, Y., Suzuki, K. Net sputtering rate due to hot ions in a Ne-Xe discharge gas bombarding an MgO layer. J. Appl. Phys. 109, 084908(2011).
- Nakles, M. R. Experimental and Modeling Studies of Low-Energy Ion Sputtering for Ion Thrusters [dissertation]. , Virginia Polytechnic Institute and State University. 1-129 (1988).
- Hada, M., Ninomiya, S., Seki, T., Aoki, T., Matsuo, J. Using ellipsometry for the evaluation of surface damage and sputtering yield in organic films with irradiation of argon cluster ion beams. Surf. Interface Anal. 43, 84-87 (2011).
- Kozole, J., Wucher, A., Winograd, N. Energy deposition during molecular depth profiling experiments with cluster ion beams. Anal. Chem. 80, 5293-5301 (2008).
- Linde, D. vonder, Sokolowski-Tinten, K. The physical mechanisms of short-pulse laser ablation. Appl. Surf. Sci. 154-155, 1-10 (2000).
- Margetic, V., Bolshov, M., Stockhaus, A., Niemax, K., Hergenroder, R. Depth profiling of multi-layer samples using femtosecond laser ablation. J. Anal. At. Spectrom. 16, 616-621 (2001).
- Cui, Y., Moore, J. F., Milasinovic, S., Liu, Y., Gordon, R. J., Hanley, L. Depth profiling and imaging capabilities of an ultrashort pulse laser ablation time of flight mass spectrometer. Rev. Sci. Instrum. 83, 093702(2012).
- Borowiec, A., MacKenzie, M., Weatherly, G. C., Haugen, H. K. Femtosecond laser pulse ablation of GaAs and InP: Studies utilizing scanning and transmission electron microscopy. Appl. Phys. A. 77, 411-417 (2003).
- Harasaki, A., Schmit, J., Wyant, J. C. Offset of coherent envelope position due to phase change on reflection. Appl. Opt. 40, 2102-2106 (2001).
- Luttge, A., Arvidson, R. S. Reactions at surfaces: A new approach integrating interferometry and kinetic simulations. J. Am. Ceram. Soc. 93, 3519-3530 (2010).
- Conroy, M., Mansfield, D. Scanning interferometry: Measuring microscale devices. Nature Photonics. 2, 661-663 (2008).
- Harasaki, A., Wyant, J. C. Fringe modulation skewing effect in white-light vertical scanning interferometry. Appl. Opt. 39, 2101-2106 (2000).
- Roy, M., Schmit, J., Hariharan, P. White-light interference microscopy: Minimization of spurious diffraction effects by geometric phase-shifting. Opt. Express. 17, 4495-4499 (2009).
Access restricted. Please log in or start a trial to view this content.
Nachdrucke und Genehmigungen
Genehmigung beantragen, um den Text oder die Abbildungen dieses JoVE-Artikels zu verwenden
Genehmigung beantragenWeitere Artikel entdecken
This article has been published
Video Coming Soon
Copyright © 2025 MyJoVE Corporation. Alle Rechte vorbehalten