Method Article
Experimentelle Methoden für das Einfangen von Ionen mit Microfabricated Oberfläche Ionenfallen
In diesem Artikel
Zusammenfassung
Dieses Papier stellt eine Microfabrication Methodik zur Oberfläche Ionenfallen, sowie ein detailliertes experimentelle Verfahren für Überfüllung Ytterbium Ionen in einer Raumtemperatur Umgebung.
Zusammenfassung
Ionen in einem Quadrupol Paulfalle gefangen wurden eines der starken physischen Kandidaten zur Quanteninformationsverarbeitung Umsetzung berücksichtigt. Dies ist aufgrund ihrer langen Kohärenz-Zeit und ihre Fähigkeit zu manipulieren und zu einzelnen Quantenbits (Qubits) zu erkennen. In den letzten Jahren haben Microfabricated Oberfläche Ionenfallen mehr Aufmerksamkeit für groß angelegte integrierte Qubit-Plattformen erhalten. Dieses Papier stellt eine Microfabrication Methodik für Ionenfallen mit Micro-Electro-Mechanical (MEMS)-Systemtechnologie, einschließlich der Herstellungsverfahren für einen 14 µm dicken dielektrische Schicht und Metall Überhang Strukturen auf die dielektrische Schicht. Darüber hinaus ist ein experimentelles Verfahren für trapping Ytterbium (Yb) Ionen des Isotops 174 (174Yb+) mit 369.5 nm, 399 nm, und 935 nm Diodenlaser wird beschrieben. Diese Methoden und Verfahren beinhalten viele wissenschaftliche und technische Disziplinen, und dieser Beitrag stellt zunächst die detaillierte experimentelle Verfahren. In diesem Artikel beschriebenen Methoden sind leicht um das Abfangen von Yb-Ionen des Isotops 171 (171Yb+) und die Manipulation der Qubits erweiterbar.
Einleitung
Eine Paulfalle kann geladene Teilchen, Ionen in einem leeren Raum, mit einer Kombination aus einem statischen elektrischen Feld und eine unterschiedliche elektrische Feld oszillierend auf Radiofrequenz (RF), einschließlich beschränken und die Quantenzustände der Ionen in der Falle beschränkt kann gemessen werden und 1,2,3gesteuert. Solchen Ionenfallen wurden ursprünglich für präzise Messung Anwendungen, einschließlich optischen Uhren und Massenspektroskopie4,5,6entwickelt. In den letzten Jahren haben diese Ionenfallen auch aktiv erforscht wie eine physische Plattform zur Umsetzung der Quanteninformationsverarbeitung die wünschenswerten Eigenschaften der Gefangenen Ionen, wie z. B. lange Kohärenz, ideale Isolation in einer extrem hohen zugeschrieben Vakuum (UHV) Umwelt und die Machbarkeit von einzelnen Qubit Manipulation7,8,9,10. Seit Kielpinski Et Al. 11 vorgeschlagen eine skalierbare Ionenfallen-Architektur, die verwendet werden kann, Quantencomputer, verschiedene Arten von Oberflächen fallen, einschließlich Kreuzung fallen12,13, Mehrzonen-Falle Chips14und 2-d Array zu entwickeln fallen15,16,17, entstanden mit Halbleiter Prozess abgeleitet Microfabrication Methoden18,19,20,21 . Groß angelegte Quantum informationsverarbeitender Systeme basierend auf der Oberfläche, fallen auch gewesen diskutiert22,23,24.
Dieser Beitrag stellt experimentelle Methoden für Überfüllung Ionen mit Microfabricated Oberfläche Ionenfallen. Genauer gesagt, ein Verfahren zur Herstellung von Oberflächen Ionenfallen und ein detailliertes Verfahren für Trapping-Ionen mit den vorgefertigten fallen werden beschrieben. Darüber hinaus sind detaillierte Beschreibungen der verschiedenen praktische Techniken zur Einrichtung des experimentellen Systems und einfangen von Ionen in das Zusatzdokumentzur Verfügung gestellt.
Die Methodik für die Microfabricating erhält eine Oberfläche Ionenfallen in Schritt 1. Abbildung 1 zeigt eine vereinfachte schematische Darstellung einer Oberfläche Ionenfalle. Die elektrischen Felder durch die Spannung an den Elektroden in der Querebene erzeugt werden auch25angezeigt. Eine HF-Spannung wird auf das Paar von RF Elektroden angewendet, während alle anderen Elektroden RF Boden gehalten werden; die ponderomotorische potenziellen26 durch die HF-Spannung erzeugt beschränkt sich die Ionen in radialer Richtung. Der Gleichstrom (DC) Spannung an die mehrere DC-Elektroden außerhalb der RF-Elektroden beschränken die Ionen in Längsrichtung. Die inneren Schienen zwischen den RF-Elektroden sollen dazu beitragen, die Hauptachsen des Gesamtpotenzials in der Querebene zu kippen. Die Methodik für die Gestaltung einer DC-Spannung-Reihe gehört das Zusatzdokument. Darüber hinaus finden Sie weitere Details zu entwerfen die wesentlichen geometrischen Parameter der Oberfläche Ionenfallen-Chips in27,28,29,30,31.
Das Herstellungsverfahren, die in Schritt 1 eingeführt wurde entwickelt, unter Berücksichtigung der folgenden Aspekte. Erstens sollte die dielektrische Schicht zwischen der Elektrode und der Bodenschicht dick genug um elektrischen Durchschlag zwischen den Schichten zu verhindern. Im Allgemeinen sollte die Dicke über 10µm. Während der Abscheidung der dicken dielektrische Schicht kann die Eigenspannungen aus den hinterlegten Filmen Verbeugung des Substrats oder Schäden an den hinterlegten Filmen führen. So ist steuern die Restspannung eines der wichtigsten Techniken in der Herstellung der Oberfläche Ionenfallen. Zweitens sollte die Belichtung der dielektrischen Oberflächen auf die Ionen-Position minimiert werden, da streunende Gebühren auf das dielektrische Material von verstreuten Ultraviolett (UV) Laser, induziert werden können die in wiederum führt eine zufällige Verschiebung von Ionen zu positionieren. Die exponierte Bereich kann durch die Gestaltung Überhang Elektrodenstrukturen reduziert werden. Es wurde berichtet, dass das Ionenfallen mit Elektrode Überhänge sind resistent gegen laden unter typischen Versuchsbedingungen32Oberfläche. Dritte, alle Materialien, einschließlich der verschiedenen hinterlegte Filmen sollte 200 ° C backen für ca. 2 Wochen aushalten, und die Höhe der Ausgasung aus allen Materialien sollte mit UHV-Umgebungen kompatibel sein. Das Design der Oberfläche Ionenfallen-Chips-Microfabricated in diesem Papier basiert auf der Falle Design von33, die erfolgreich in verschiedenen Experimenten32,33,34, verwendet wurde 35. beachten Sie, dass dieses Design einen Schlitz in der Mitte des Chips enthält, für Laden von neutralen Atomen, die später Foto-für Überfüllung ionisiert.
Nach der Herstellung von Ionenfallen Chip ist der Chip montiert und elektrisch angeschlossen an den Chip-Träger mit gold Bonddrähte. Der Chip-Träger wird dann in einer UHV-Kammer installiert. Eine detaillierte Anleitung für die Vorbereitung einer Trap-Chip-Package und das Design der UHV-Kammer werden in das Ergänzende Dokumentbereitgestellt.
Vorbereitung der Trapping-Ionen, die optische und elektrische Ausrüstung sowie die experimentelle Verfahren sind in Schritt 2 ausführlich erläutert. Die Ionen durch die ponderomotorische potenzielle gefangen sind in der Regel unterliegen den Schwankungen des umgebenden elektrischen Feldes, die kontinuierlich die mittlere kinetische Energie der Ionen erhöht. Laser cooling anhand der Doppler-Verschiebung kann verwendet werden, um die überschüssige Energie aus der Bewegung der Ionen zu entfernen. Abbildung 2 zeigt die vereinfachte Energieniveau Diagramme von einem 174Yb+ Ion und eine neutrale 174Yb Atom. Doppler Kühlung von 174Yb+ -Ionen erfordert eine 369,5-nm-Laser und eine 935-nm-Laser, während Foto-Ionisation der neutralen 174Yb Atome einen 399-nm-Laser erfordert. 2.2 und 2.3 beschrieben, eine effiziente Methode um diese Laser die Oberfläche Ionenfallen-Chip und ein Verfahren zu finden, die richtigen Voraussetzungen für Foto-Ionisation auszurichten. Nachdem die optischen und elektrischen Komponenten vorbereitet sind, ist das Einfangen von Ionen relativ einfach. Die experimentelle Sequenz für Trapping-Ionen ist in Schritt 2.4 vorgestellt.
Protokoll
1. Herstellung von Ionenfallen Chip-Package
- Microfabrication von der Oberfläche Ionenfallen-Chip.
Hinweis: Die in diesem Abschnitt beschriebenen Bedingungen bieten nur eine grobe Referenz, da die optimalen Parameter für jeden Prozess für unterschiedliche Geräte erheblich variieren können. Die Temperaturverhältnisse sind nur für die Hochtemperatur-Prozesse, wie Oxidation und chemische Aufdampfen gegeben. Die Fertigung erfolgt mit 100 mm Durchmesser-Silizium-Wafern.- Vorbereitung ein einziges kristallines Silizium wafer mit einer Dicke von 500-525 µm und reinigen Sie sie mit Piranha-Lösung für 15 min.
- Thermisch oxidieren der Silizium-Wafer in einem Ofen Rohr 0,5 µm dicken SiO 2 dielektrische Schichten auf beiden Seiten bilden.
Hinweis: Diese Schichten können elektrisch isolieren, die Silizium-Substrat aus dem Bodengrund. Die Prozessparameter in der nass-Oxidation verwendet wurden: O 2 Flussrate von 6.500 Sccm, N 2 Durchfluss von 5.000 Sccm, H 2 Durchfluss von 7.000 Sccm, Temperatur von 900 ° C zu verarbeiten und Prozesszeit von 4,5 h (siehe Materialien für Ausstattungsdetails). - Einzahlen 0,2 µm dicken Si 3 N 4 Schichten auf beiden Seiten des Wafers mit Niederdruck chemical Vapor Deposition (LPCVD) Prozess ( Abbildung 3a), um die thermische Oxidschichten zu schützen während der nass-Ätzprozess dargestellt in Abbildung 3 k.
Hinweis: Der Prozess-Parameter in dem LPCVD-Verfahren verwendet werden: H 2 SiCl 2 Durchfluss 30 Sccm, NH 3 Durchflussmenge von 100 Sccm, Druck von 200 mTorr und Prozesstemperatur von 785 ° C. Dies führt zu einer Abscheiderate von 40 Å / min (siehe die Tabelle der Materialien für Ausstattungsdetails). - Hinterlegen einer 1,5 µm dicken Al/Cu (1 %) Schicht auf dem Wafer mit einem Sputterprozess und die folgenden Parameter: Ar Durchfluss 40 Sccm, Druck von 2 mTorr und HF-Leistung von 300 w
Hinweis: Dadurch wird eine Abscheiderate von 130 Å / min (siehe die Tabelle der Materialien für Ausstattungsdetails).
Hinweis: Diese Schicht stellt eine Bodenebene um RF-Verlust durch den Silizium-Substrat zu verhindern sowie Kontaktstellen für Drahtbonden Pads. Die Aluminium-Legierung mit 1 % Kupfer wird verwendet, um zu verhindern, dass die Whiskerbildung während des Backvorgangs eine UHV Umwelt zu erreichen. Diese Komposition ist unerlässlich für die Whisker Prävention. - Spin eine 2 µm dicken positiven Photoresist-Schicht auf dem Wafer und lithographically Muster um die RF Abschirmung Flugzeug und Drahtbonden Pads zu definieren.
Hinweis: Sind die Prozessparameter für die 2 µm dicken Photoresist: Schleuderdrehzahl von 5.000 u/min, spin Zeit der 40 s, Pre-Bake Temperatur 95 ° c, Pre-Bake-Zeit von 90 s, Exposition Energie von 144 mJ/cm 2, entwickeln mal 60 s, nach dem Backen Temperatur von 110 ° C und nach dem Backen Zeit von 5 Minuten (siehe Tabelle der Materialien für die chemische und Ausrüstung). - Muster der 1,5 µm dicken Al/Cu (1 %) layer mit einem herkömmlichen trocken-Ätzen-Verfahren (reaktive Ionen Ätzen (RIE) oder Induktiv gekoppelte Plasma (ICP) Radierung), Schritt mit den Fotolack gemustert 1.1.5 als die Ätzmaske.
Hinweis: Radierer ICP sollte mit den folgenden Prozess-Parameter verwendet werden: BCl 3 Flussrate von 20 Sccm, Cl 2 Durchfluss von 30 Sccm, Druck von 5 mTorr und HF-Leistung von 750 w. Dies führt zu einer Etch-Rate von 3.600 Å/min (siehe die Tabelle der Materialien für Ausstattungsdetails). - Entfernen der Fotolack verwendet in Schritt 1.1.6 Usung O 2 Plasma Veraschung ( Abb. 3 b).
Hinweis: Der Prozess-Parameter für die Veraschung sind: O 2 Durchfluss 150 Sccm, Druck von 0,75 mTorr und HF-Leistung von 300 W (siehe die Tabelle der Materialien für Ausstattungsdetails). - Hinterlegen einer 14 µm dicken SiO 2 Schicht auf beiden Seiten des Wafers mit Plasma-enhanced chemical Vapor Deposition (PECVD) Verfahren ( Abb. 3 c).
Hinweis: Der Prozess-Parameter in dem PECVD-Verfahren verwendet werden: SiH 4 Durchfluss von 540 Sccm, Druck von 1,9 Torr, Prozesstemperatur von 350 ° C und HF-Leistung von 750 w. Dies führt zu einer Abscheiderate von 3.000 Å / min (siehe die Tabelle der Materialien für Ausstattungsdetails). Da die 14 µm dicken SiO 2 Schicht einer der schwierigsten Prozesse ist, die Details werden weiter in der Diskussion beschrieben. - Spin eine 6 µm dicken positiven Photoresist-Schicht auf der Vorderseite des Wafers und lithographically Muster zu definieren, über Löcher zum elektrisch DC Elektroden die Drahtbonden Pads herstellen.
Hinweis: Sind die Prozessparameter für 6 µm dicken Photoresist: Schleuderdrehzahl von 5.000 u/min drehen mal 40 s, Pre-Bake Temperatur 95 ° c, Pre-backen Zeit von 5 Minuten, Exposition Energie von 900 mJ/cm 2, entwickeln mal 10 min, nach dem Backen Temperatur von 110 ° C und nach dem Backen Zeit von 5 Minuten (siehe Tabelle der Materialien für die chemische und Ausrüstung). - Muster der 14 µm dicken SiO 2 Schicht auf der Vorderseite des Wafers mit einem konventionellen RIE-Verfahren, mit den Fotolack gemustert in Schritt 1.1.9 als die Ätzmaske.
Hinweis: Sind die Prozessparameter für SiO 2 Radierung: CHF 3 Flussrate von 25 Sccm, CF 4 Durchfluss von 5 Sccm, Ar Durchflussmenge von 50 Sccm, Druck von 130 mTorr und HF-Leistung 600 w. Dies führt zu einer Etch-Rate von 3.600 Å/min (siehe die Tabelle der Materialien für Ausstattungsdetails). - Entfernen der Fotolack in Schritt 1.1.10 mit einem O 2 Plasma Veraschung verwendet. Den Wafer in einem beheizten Lösungsmittel eintauchen oder vor Warnsignal ( Abbildung 3d) beschallen.
- Spin eine 6 µm dicken positiven Photoresist-Schicht auf der Rückseite des Wafers und lithographically Muster zu einem Oxid schwer Maske für die tief reaktive Ionen Ätzen (DRIE) von Silizium-Substrat ( Abbildung 3j).
- Muster der 14 µm dicken SiO 2 Schicht auf der Rückseite des Wafers mit einem konventionellen RIE-Verfahren, mit dem Fotolack gemustert in Schritt 1.1.12 als die Ätzmaske.
- Entfernen der Fotolack verwendet im Gleichschritt 1.1.13 mit einem O 2 Plasma Veraschung ( Abbildung 3e).
- Einzahlen ein 1,5 µm dicken Al/Cu (1 %) Schicht, die als die Elektrode mit einem Sputterprozess verwendet wird.
- Hinterlegen eine 1 µm dicken SiO 2 Schicht auf dem Wafer mit einem PECVD-Verfahren ( Abbildung 3f).
- Spin eine 2 µm dicken positiven Photoresist-Schicht auf dem Wafer und lithographically Muster um die Elektroden zu definieren.
- Muster der 1,5 µm dicken Al/Cu (1 %) Schicht und 1 µm dicken SiO 2 Schicht mit einer konventionellen ICP Ätzverfahren mit den Fotolack gemustert in Schritt 1.1.17 als die Ätzmaske.
- Entfernen der Fotolack verwendet im Gleichschritt 1.1.18 mit einem O 2 Plasma Veraschung ( Abbildung 3 g).
- Spin eine 6 µm dicken positiven Photoresist-Schicht auf dem Wafer und lithographically Muster um die 14 µm dicken Oxid Säule Muster definieren.
- Der 14 µm dicken SiO 2 Dekorschicht mit einem konventionellen RIE-Verfahren, mit dem Fotolack gemustert in Schritt 1.1.20 als die Ätzmaske.
- Entfernen der Fotolack verwendet im Schritt 1.1.21 mit einem O 2 Plasma Veraschung ( Abbildung 3 h).
- Spin eine 6 µm dicken positiven Photoresist-Schicht auf dem Wafer und lithographically Muster, damit sich der Ladeschlitz.
- Muster der SiO 2 und Si 3 N 4 Schichten mit Hilfe eines herkömmlichen RIE zu verarbeiten, mit den Fotolack gemustert in Schritt 1.1.23 als die Ätzmaske.
- Entfernen der Fotolack verwendet im Schritt 1.1.24 mit einem O 2 Plasma Veraschung ( Abbildung 3i).
- Muster der Silizium-Substrat aus der Rückseite des Wafers mit einem DRIE-Verfahren ( Abbildung 3j).
Hinweis: Etch Tiefe sollte wiederholt gemessen werden, um zu verhindern das Eindringen von Silizium-Substrat von der Rückseite. Das Ziel Ätzen Tiefe beträgt etwa 450-470 µm. Die DRIE Prozess erfolgte mit Iterationen der C 4 F 8 Ablagerung für 5 s, C 4 F 8 Ätzen für 3 s und Si Ätzen für 5 s. In der C 4 F 8 Ablagerung Schritt, die Fördermengen von C 4 F 8, waren SF 6 und Ar 100, 0,5 und 30 Sccm, beziehungsweise. Beachten Sie, dass Ar verwendet wird, um die Etch C 4 F 8 und Si beschleunigen, aber es auch in den C 4 F 8 Ablagerung Schritt, mit der gleichen Durchfluss gilt, Druck Zustand zu stabilisieren. In der C 4 F 8 Ätzen Schritt, die Fördermengen um 0,5, 50 und 30 Sccm bzw. geändert wurden. In der Si Ätzen bzw. Schritt, Volumenströme von 0,5, 100 und 30 Sccm verwendet wurden. Die HF-Leistung und der Kammerdruck wurden 825 W und 23 mTorr in allen Schritten eingestellt. Für diese Bedingungen Ätzen der Si lag die for each-Schleife 1 µm (siehe die Tabelle der Materialien für Ausstattungsdetails). - Würfel den Wafer in 10 mm X 10 mm Stücke würfeln Maschinenbenutzung.
- Trennen die dicing Tape aus der Düse durch Eintauchen in Aceton für 5 min. Reinigen der Düse durch Eintauchen in Fließwasser deionisiertes (DI) für 10 min und Isopropylalkohol (IPA) für 2 min. es für 2 min bei 110 trocknen ° c
- Etch die Seitenwände der Oxid Säulen herzustellen Elektrodenstrukturen Überhang mit ein Oxid nass Ätzprozess für 60 s in einer gepufferten Oxid Ätzmittel (BOE), die ist (NH 4 F:HF = 6:1) ( Abbildung 3-k). Reinigen der Düse durch Eintauchen in fließendem DI Wasser für 10 min und IPA für 2 min. es für 2 min bei 110 trocknen ° c
- Dringen die schlitzförmige Ion laden Loch aus der Vorderseite des Würfels mit einem DRIE Verfahren.
Hinweis: Der Fertigungsprozess der Ionenfallen Chips ist bei diesem Schritt ( Abbildung 3 l) abgeschlossen.
2. Herstellung von optischen und elektrischen Geräten und Trapping Ionen
Hinweis: der vorgefertigten Trap-Chip ist mit einem Chip-Träger verpackt, und der Chip-Träger in einer UHV-Kammer installiert ist. Während Verfahren für die Herstellung der Trap-Chip-Package und zur Vorbereitung auf der UHV-Kammer in das Ergänzende Dokument bereitgestellt werden, dieser Abschnitt beschreibt die Details zum Einrichten von optischen und elektrischen Geräten und für die Fallenjagd Ionen.
- Vorbereitung der elektrischen Anschlüsse.
- Connect ein Multi-Kanal Digital-Analog-Wandler (DAC), die Durchführung auf der Rückseite der UHV-Kammer, Spannung auf dem entsprechenden DC Steuerelektroden anzuwenden.
Hinweis: Die Abbildung 4 zeigt ein Beispiel der angelegten Spannung an den Trap-Chip. Die detaillierte Methode für die Gestaltung solcher eine DC-Spannung-Reihe wird beschrieben in dem Zusatzdokument. - Ein Ofen-Pin in der Durchführung auf der Rückseite eine Stromquelle anschließen.
- Fügen Sie ein gerichtetes Koppler zwischen einem HF-Generator und die spiralförmige Resonator. Verbinden Sie das Signal von HF-Generator an den Ausgabeport des direktionalen Kopplers. Verbinden Sie den Eingang des Kopplers gerichtete außerdem an den Eingang des schraubenartigen Resonators.
Hinweis: Diese Konfiguration ermöglicht eine Überwachung die reflektierte Leistung aus der spiralförmige Resonator 36. - Passen Sie die Position der spiralförmigen Resonator GAP und Scannen Sie die Frequenz des Generators auf die Frequenz zu finden, an der die Reflexion auf ein Minimum ist. Wiederholen Sie diesen Schritt, bis das globale Minimum gefunden wird.
Hinweis: Die Häufigkeit, in der globalen Minimum ist die Resonanzfrequenz. Verwendung von einem Spektrumanalysator mit einem Tracking Generator Option oder Messung des Parameters S 11 mit einem Netzwerk-Analyzer kann der Scan-Vorgang für die minimale Reflexion zu vereinfachen. Wenn sich die elektrischen Anschlüsse mit einer Spannungsquelle DAC oder Stromquelle für den Backofen ist geändert, die Impedanz des RF-Durchführung geändert, und die Resonanzfrequenz verschiebt. - HF-Generator ausschalten.
Achtung: Wenn die spiralförmige Resonator hohe HF-Spannung zum Ableiter übernommen wird, ändern Sie sich keine elektrischen Verbindungen, die Impedanz Veränderungen hervorrufen können. Plötzliche Impedanz Änderungen können ganz einfach die Bonddrähte des Chips brennen.
- Connect ein Multi-Kanal Digital-Analog-Wandler (DAC), die Durchführung auf der Rückseite der UHV-Kammer, Spannung auf dem entsprechenden DC Steuerelektroden anzuwenden.
- Ausrichtung der 369.5 nm-Laser und das Abbildungssystem.
- 369,5-nm-Laser aus einer optischen Faser mit einem Kollimator lassen und versuchen, die Höhe des Kollimators von der Oberfläche des optischen Tisch auf die Höhe des Chips passen; machen den Strahl horizontal ausbreiten.
- Legen Sie die verbreitende Richtung des kollimierten Strahls 369,5 nm in Richtung der Trap-Chip durch entweder nach links oder rechts Ansichtsfenster der UHV-Kammer, wie in Abbildung 5 dargestellt. Richten Sie es so, dass der Laserstrahl breitet sich Parallel zu den Trap-Chip-Oberfläche und fast die Oberfläche des Chips berührt grob.
- Eine Linse für den 369,5-nm-Laser auf einem Verschiebetisch montieren. Der Fokussierlinse verbreitende Richtung zu platzieren, so dass der Laser in der Nähe die Trapping-Position über die Chip-Oberfläche fokussiert werden und damit die fokussierte Laser entlang der Trap-Chip-Oberfläche ausbreitet. Richten Sie die Linse mit der Übersetzung Bühne; die Position des Laserfokus Strahl folgt die Bewegung der Fokussierlinse.
- Stelle eine hoher numerischer Apertur Bildbearbeitung Objektiv montiert auf einer Übersetzung-Bühne vor der UHV-Kammer, unter Berücksichtigung der Entfernung von der Chipoberfläche ( Abbildung 5).
- Den 369,5-nm-Strahl mit der Trap-Chip-Oberfläche so ausrichten, dass gibt es eine gewisse Menge an Laser-Streuung von der Chipoberfläche.
Hinweis: Das gestreute Licht gesammelt durch die bildgebenden Linse bilden ein schwaches Bild in der Bildebene des Objektivs. Dieses Bild kann in der Regel beobachtet werden, auch mit fluoreszierendem Papier wenn Bereich ausreichend dunkel ist. - Passen Sie die Position der bildgebenden Linse, bis das Bild auf dem fluoreszierendes Papier scharf wird.
- Stelle, die eine Elektron multipliziert aufgeladen-gekoppelten Gerät (EMCCD) montiert auf einem Verschiebetisch, in Anbetracht der Lage der Abbildungsebene des Objektivs, gefunden im vorherigen Schritt.
- Montieren einen Infrarot (IR)-Filter vor der EMCCD, die Wärmestrahlung aus dem Ofen zu sperren, wenn der Ofen zum Verdampfen erhitzt wird.
- Montieren einen 369,5 nm Bandpassfilter vor der EMCCD, die Hintergrundbeleuchtung zu blockieren.
- Vergleichen Sie die Darstellung der EMCCD mit dem Layout der Elektroden. Passen Sie die Positionen der EMCCD und das Bild Objektiv, bis die Elektroden mit dem EMCCD gesehen werden können. Ausrichten der bildgebenden Linse und der EMCCD, bis das Bild scharf wird.
- Identifizieren welche Elektroden werden in die EMCCD und EMCCD angepasst sein Zentrum an die erwarteten Trapping-Position ausrichten.
- Den 369,5-nm-Strahl vertikal so ausrichten, dass es durch die Überfüllung Position übergeben werden. Um den Abstand zwischen der Mitte des Balkens und der Trap-Oberfläche zu erfahren, bewegen Sie den Strahl in Richtung der Falle Oberfläche bis die Streuung des Strahls maximiert wird.
Hinweis: Nach Schritt 2.2.12, ist davon auszugehen, dass das Zentrum des Strahls direkt auf die Chipoberfläche. - Aus der numerischen Simulation der möglichen Falle 29, finden die erwartete Höhe der Ion-Trapping Position von der Chipoberfläche. Bewegen Sie den 369.5 nm Strahl von der Chipoberfläche durch die erwartete Höhe mit Mikrometer von der Objektiv-Übersetzung-Bühne. Zurückbewegen der bildgebenden Linse und der EMCCD um denselben Abstand. Notieren Sie sich den Mikrometer Lesungen der bildgebenden Linse und die EMCCD.
- Ausrichtung der 399 nm und 935 nm-Laser und dem Backofen-Test
- Ersetzen die 369,5 nm Bandpass mit 399 nm Bandpassfilter filtern Finden Sie aus der numerischen Simulation der bildgebenden Linse den Unterschied zwischen der Brennweite von 399-nm-Licht und der 369,5-nm-Licht durch die chromatische Aberration. Stellen Sie die longitudinalen Positionen der bildgebenden Linse und EMCCD zu 399-nm, konzentrierte sich auf die EMCCD.
- Lassen die 399 und 935 nm Strahlen, aus optischen Fasern, mit den jeweiligen Kollimatoren geliefert und passen Sie die Höhen der Faser Kollimatoren entsprechend die Höhe des Chips zu beiden Balken horizontal ausbreiten.
- Ausrichten 399 nm-Strahl auf die Falle-Chip-Oberfläche durch ein anderes Ansichtsfenster, sodass der 399 nm Laser in die entgegengesetzte Richtung von der 369.5 nm Laser propagiert wird. Versuchen, die kollimierten 399 nm Laser Überlappung mit dem fokussierten 369.5 nm Laser.
- Verbinden den kollimierten Strahl für 935 nm mit dem kollimierten 399 nm Laser mit einem dichroitischen Spiegel und 935 nm Strahl ausrichten, so dass die 935 nm Laser mit dem 399-nm-Laser Co propagiert. Um zu überprüfen, wie gut die beiden Strahlen mit einander überlappen, leiten Sie diese beiden Strahlen mit einem temporären Spiegel bevor sie die Kammer und die Standorte der Balken entlang der Strahlengang mit einem Beam Profiler oder einer Lochkamera zu messen. Wenn Platz nicht ausreicht für die Platzierung des temporären Spiegels zwischen der Kammer und der Fokussierlinse, Erwägung ziehen Sie, der optische Aufbau auf eine kleine optische Steckbrett; der Grad der Überlappung kann überprüft werden, an einem separaten Ort.
- Eine Fokussierlinse für beide Laser auf eine zusätzliche Verschiebetisch montieren und Einstellen der Fokussierlinse zwischen den dichroitischen Spiegel und die temporäre Spiegel. Schätzen Sie die Entfernung der temporären Spiegel die Trapping-Position und ändern Sie die Position der fokussierenden Linse, so dass die 399 nm Laser an der Trapping-Position ( Abb. 6 b) ausgerichtet ist.
- Prüfen, ob im Mittelpunkt der 399 nm Laser mit dem Fokus des 935 nm Lasers zusammenfällt. Wenn die zwei Brennpunkte nicht überschneiden, fein ausrichten der 935 nm Laser.
- Entfernen den temporären Spiegel im 399 nm Laser Pfad. Überprüfen Sie die Spur von 399 nm-Laser auf der Chipoberfläche mittels EMCCD. Wenn keine Spur des Laserstrahls 399 nm beobachtet werden kann, verschieben Sie 399 nm Strahlengang um den Chip. Auch leicht stellen Sie den Abstand zwischen der Kammer und dem bildgebenden Objektiv bis das Bild von der Chip-Oberfläche scharf wird.
- Richten Sie die Spur von 399 nm Strahls auf der Chip-Oberfläche so, dass es die erwarteten Trapping Position übergeben wird. Ähnlich wie bei den 369.5 nm Breite Ausrichtung, Umzug der 399-nm-Strahl auf die Chipoberfläche bis die Intensität des gestreuten Lichts maximiert wird.
- Bewegen der 399 nm-Laser-Strahl von der Chipoberfläche durch die gleiche Höhe in Schritt mit einem Mikrometer 2.2.13 verwendet. Bildbearbeitung Objektiv und der EMCCD zurückbewegen, um denselben Abstand.
- Setzen die temporäre Spiegel in 2.3.4 Rückschritt verwendet. Wiederholen Sie Schritt 2.3.6 und entfernen Sie anschließend die temporären Spiegel.
Hinweis: Nach Schritt 2.3.10 935 nm Laser kann davon ausgegangen werden, Durchgang durch die Trapping-Position über die Chipoberfläche. - Setzen die Wellenlänge des Lasers 399 nm in der Nähe von 1 S 0-1 P 1 Übergang von 174 Yb (751.526 GHz). Schalten Sie den Strom für der Ofen gefüllt mit natürlich vorkommenden Yb und schrittweise Erhöhung des Stroms.
Hinweis: im allgemeinen Verdampfung beginnt nicht unbedingt an der gleichen aktuellen gefunden von Restgas Analyzer (RGA), wie in das Ergänzende Dokument beschrieben, so versuchen Sie verschiedene Stromwerte bis Verdunstung beobachtet wird. Nur wenn die neutrale Atome Yb beginnen zu verdampfen und die Frequenz des Lasers resonant mit 1 S 0-1 P 1 Übergang eines Yb-Isotope, die neutrale Yb Atome beginnt zu absorbieren der Laser Licht und erneut zu emittieren, so dass die Fluoreszenz von der Yb mit dem EMCCD beobachtet werden kann. Im Allgemeinen sind die Resonanzfrequenzen von einem Meter Wellenlänge gemessen von den Sollwerten, Dutzende bis Hunderte von MHz bis hin verlagert. Daher für jede aktuelle Einstellung empfohlen ist Scannen Laser Frequenz mit Span Range von 1 GHz und ein Schritt von weniger als 50 MHz. - Sobald die resonante Fluoreszenz aus dem natürlich vorkommenden Ofen beobachtet wird, reduziert den Strom, bis die Fluoreszenz beobachtet werden kann.
- Scannen Sie den Laser um die erste Resonanzfrequenz und notieren Sie sich die Höhe der Fluoreszenz auf jede Resonanz. Vergleichen Sie die Verteilung der Fluoreszenz-Stärke und die Abstände zwischen den Resonanzen mit den Werten aus 37. Identifizieren die Resonanzfrequenzen für die verschiedenen Isotope.
Hinweis: Die Resonanz der 174 Yb wurde um ca. 751.52646(2) THz werden gemessen. Aber dieser Wert wird durch den Doppler-Effekt leicht verschoben und der gemessene Wert kann variieren, abhängig von der Genauigkeit des Messgerätes Wellenlänge.
- Ionen trapping.
- 399 nm Bandpassfilter mit dem 369.5 nm Bandpassfilter zu ersetzen und Verschieben der bildgebenden Linse und die EMCCD zurück auf die Position im Schritt 2.2.13 erhalten, so dass die 369,5-nm-Fluoreszenz emittiert von Gefangenen Ionen bei der EMCCD abgebildet werden kann. Prüfen Sie die Ausrichtung der Laser noch einmal durch Wiederholung von Schritt 2.2.12 und mit UV- und IR-Karten für die Sichtprüfung der Strahl Überlappung.
- Zu überprüfen, dass die Spannungen der DAC einre richtig eingestellt. HF-Generator bei einem sehr niedrigen Leistung schalten und schrittweise Erhöhung der Ausgangsleistungs. Stellen Sie außerdem sicher, dass die reflektierte Leistung aus dem spiralförmigen Resonator noch das Minimum ist durch das Scannen der RF-Frequenz um die Resonanz.
Achtung: Stellen Sie sicher, dass die verstärkte Spannung an den Trap-Chip nicht die Durchbruchspannung übersteigt. In atmosphärischer Druck, die Durchschlagsfestigkeit eines SiO 2 Films ist bekannt, dass ca. 10 7 V/cm, aber dieser Wert nicht in der UHV Umwelt übernommen werden. Obwohl die genaue Durchschlagsspannung in der UHV Umwelt nicht explizit gemessen wird, der 8 µm seitlichen Abstand der Falle in eine 10 -11 chip-Torr Vakuum hält 240 V RF Spannungsamplitude im experimentellen Aufbaus. - Stellen Sie die Frequenz der 399-nm-Laser, die Resonanzfrequenz der 174 Yb, identifiziert in Schritt 2.3.13. Stellen Sie die Frequenz der 935-nm-Laser für das Isotop 174 Yb +.
Hinweis: Mit einem Meter Wellenlänge 320.57199(1) THz kann verwendet werden, aufgrund der begrenzten Genauigkeit der Wellenlänge Meter, es kann jedoch eine Variante bis zu Zehntausende MHz. - Stellen Sie die Frequenz der 369,5-nm-Laser auf einen Wert, der ca. 100-200 MHz weniger als die Resonanzfrequenz also, selbst wenn es gibt gewisse Ungenauigkeit mit der Wellenlänge Meter, die Frequenz werden noch rot verstimmt.
Hinweis: Hier, 200 MHz Verstimmung ist subtrahiert die erwartete Resonanz bei die erwarteten Resonanzfrequenz von 174 Yb + um 811.29152(1) THz ist. - Schalten Sie die Stromquelle für den Ofen und die Erhöhung der Strom langsam bis sie den Wert in Schritt 2.3.12 erreicht. Ein paar Minuten warten. Wenn keine Ionen aufgefangen wird, den Strom von ~0.1-0.2 A zu erhöhen und wieder warten. Wenn das Ion noch nicht gefangen ist, überprüfen Sie, ob die reflektierte RF noch mindestens und dann schrittweise Erhöhung die Ausgangsleistung des HF-Generators.
Achtung: Achten Sie darauf, dass die verstärkte Spannung an den Trap-Chip nicht die erwarteten Durchbruchspannung übersteigt. - Kurz blockieren die 935 nm-Laser und überprüfen Sie, ob Änderungen im Bild.
Hinweis: Wenn die EMCCD-Einstellungen (einschließlich der Elektron-Multiplikation (EM) Gain, Belichtungszeit und Kontrast des Bildes) nicht innerhalb einer Reichweite sind, selbst wenn ein Ion gefangen ist, es ist nicht leicht zu sagen, ob die Änderung der Intensität in der Nähe der Trapping-Region wird durch eine echte Gefangene Ionen oder durch den Wechsel in die Streuung des 369.5 nm Lasers verursacht. Wegen der IR-Filter kann nicht die EMCCD Kamera Änderungen in 935 nm Laser, zeigen, so blockieren die 935 nm Laser keine auf das Bild Änderungen wenn es keine eingeschlossene Ion gibt. Jedoch wenn ein Ion gefangen ist, die Diffusionsrate des 369.5 nm Lasers sinkt deutlich ohne 935 nm Laser. Daher die Änderung der EMCCD Bild verursacht durch die Blockierung der 935 nm-Laser ist ein guter Indikator für den Erfolg der Trapping-Ionen.
Achtung: Wenn der 935 nm Laser zu lange blockiert wird, die Gefangene Ion erwärmt und die Falle entkommen könnte. - Schalten Sie den Ofen nach der Ionen gefangen sind. Versuchen, die Resonanz des 369.5 nm Lasers durch die schrittweise Erhöhung der Frequenz zu finden.
Hinweis: Wenn die Frequenz der Resonanz nähert, die Diffusionsrate steigen, aber sobald die Resonanz überschritten wird, beginnt der 369.5 nm Laser Heizung das Ion, anstatt abkühlen, die wiederum Ursachen das Bild des eingeschlossenen Ions instabil werden. Sobald die Resonanzfrequenz des 369.5 nm Lasers gefunden ist, reduzieren Sie die Häufigkeit des Lasers von 10 MHz aus den Schwingungen. - Scannen die Häufigkeit von 935 nm Laser bis die Diffusionsrate von 369.5 nm maximiert wird.
- Die Standorte der bildgebenden Linse und EMCCD Kamera justiert und schärft das Bild des Ions.
Ergebnisse
Abbildung 7 zeigt den Scan Elektron Mikrographen (SEM) von den vorgefertigten Ionenfallen-Chip. RF-Elektroden, innere DC-Elektroden, äußere DC-Elektroden und Ladeschlitz wurden erfolgreich hergestellt. Die Seitenwand Profil der dielektrischen Säule wurde gezackt, weil das PECVD-Oxid in mehreren Schritten hinterlegt wurde. Mehrere Ablagerung Schritte wurden verwendet, um die Auswirkungen von Eigenspannungen aus dicken Oxid Filmen zu minimieren. Dies wird in der Diskussionweiter beschrieben.
Abbildung 8 zeigt das EMCCD Bild von fünf 174Yb+ Ionen gefangen, mit dem Microfabricated Ionenfallen Chip. Die Gefangenen Ionen können mit kontinuierlicher Doppler für mehr als 24 h dauern Kühlung. Die Zahl der Gefangenen Ionen einstellbar zwischen 1 und 20 durch Ändern der angewandten DC Spannung gesetzt. Dieser Versuchsaufbau ist sehr zuverlässig und robust und hat z.z. seit 50 Monate in Betrieb gewesen.
Abbildung 9 zeigt die pendelt der Gefangenen Ionen entlang der axialen Richtung. Die Ionen-Position in Abbildung 9 b ist aus, die in Abbildung 9a durch die Einstellung der Position der möglichen minimalen DC verschoben, durch Ändern der Gleichspannungen.
Abbildung 10 zeigt die vorläufigen Ergebnisse der Rabi Oszillation Experimente mit einem 171Yb+ Ion. Um die Ergebnisse zu erhalten, wurden die zusätzliche Setups im Zusatzdokument beschrieben verwendet. Die Ergebnisse wurden aufgenommen, um eine mögliche Anwendung des experimentellen Aufbaus erklärt in diesem Beitrag zeigen.
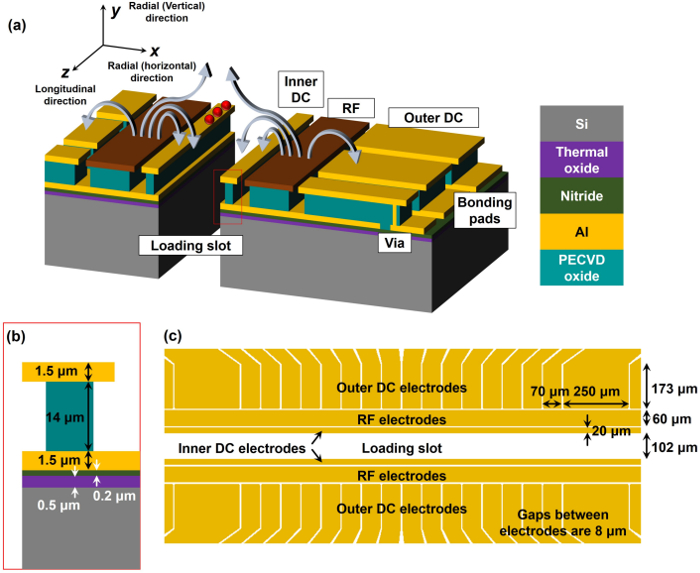
Abbildung 1: Schematische der Oberfläche Ionenfallen. (ein) die roten Punkte stehen für die Gefangenen Ionen. Die braunen und gelben Elektroden zeigen die RF und DC Elektroden bzw.. Die grauen Pfeile zeigen die Richtung des elektrischen Feldes in der positiven Phase der HF-Spannung. Beachten Sie, dass der Schaltplan ist nicht maßstabsgetreu. (b) der vertikalen Dimensionen der Elektrodenstruktur. (c) die seitlichen Abmessungen der Elektrodenstruktur. Bitte klicken Sie hier für eine größere Version dieser Figur.
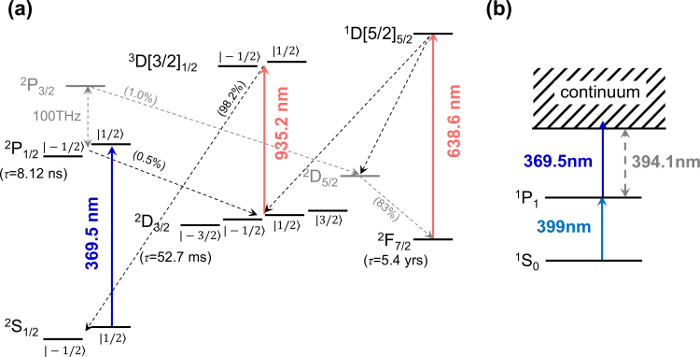
Abbildung 2: Vereinfachte Energieniveau Diagramme von einem 174Yb+ Ion und eine neutrale 174Yb Atom. (ein) Wenn ein 369.5 nm Laser an das rote Seite (niedrigere Frequenz) der Resonanz verstimmt ist, ein Fahrrad Übergang zwischen 2P1/2 und 2S1/2 reduziert die kinetische Energie des Ions wegen der Doppler Wirkung. Gelegentlich eine kleine, aber endliche Verzweigung Verhältnis macht den Elektron Zerfall aus 2P1/2 bis 2D3/2, und ein 935-nm-Laser ist erforderlich, um das Elektron wieder zurück zu den wichtigsten Radsport Übergang. Das Elektron kann auch in einen 2F7/2 Zustand einmal pro Stunde, durchschnittlich, zerfallen und 638 nm Laser Pumpen es aus 2F7/2 Zustand, aber dies ist nicht notwendig für ein einfaches System-38. Die Werte in der Ket-Notation darstellen die Projektionen der total Angular Momenta J entlang der Quantisierung Achse mJ. (b) um neutrale Atome aus dem Ofen, ein zwei-Photonen-Absorptionsprozess verdampft ionisieren war gebrauchte39. 399 nm Laser aufgeregt ein Elektron 1P1 Zustand, und das 369.5 nm Photon Doppler Kühlung hatte mehr Energie als notwendig, das aufgeregte Elektron aus der Ionen entfernen. Bitte klicken Sie hier für eine größere Version dieser Figur.
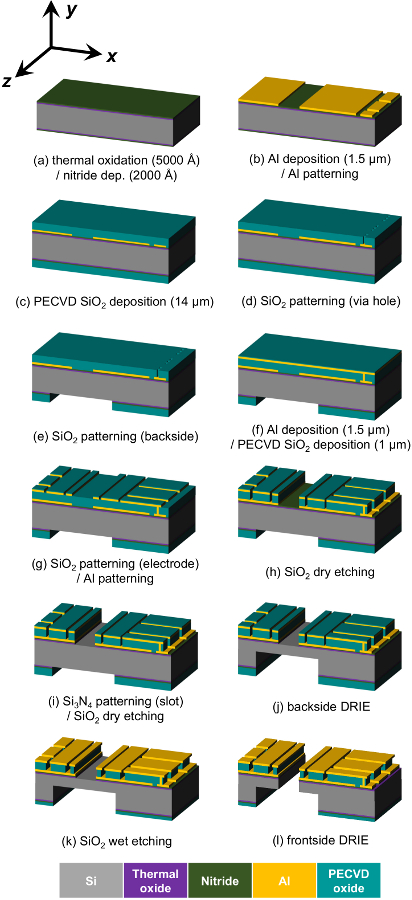
Abbildung 3: Fertigung Ablauf der Oberfläche Ionenfallen. (ein) thermische Oxidation, eine 5.000 Å dicken SiO2 Schicht und LPCVD einer 2.000 Å dicken Si3N4 Schicht wachsen. (b) Ablagerung und ICP Ätzen einer 1,5 µm dicken gesputterten Al-Schicht. (c) Abscheidung eines 14 µm dicken SiO2 Schicht auf beiden Seiten des Wafers mit PECVD-Verfahren. (d) Strukturierung der 14 µm dicken SiO2 Schicht abgeschieden auf der Vorderseite des Wafers mit einem RIE-Verfahren (e) Strukturierung der 14 µm dicken SiO2 Schicht auf der Rückseite des Wafers mit einem RIE-Verfahren hinterlegt. (f) Ablagerung von einem 1,5 µm dicken gesputterten Al-Schicht und einer 1 µm Dicke PECVD-SiO2 Schicht. (g) Strukturierung von 1,5 µm dicken Al-Schicht mit einem ICP-Verfahren und 1 µm dicken SiO2 Schicht mit einem RIE verarbeiten. (h) hinterlegt Musterung der 14 µm dicken SiO2 Schicht auf der Vorderseite des Wafers mit einem RIE-Verfahren. (ich) Strukturierung von 5.000 Å dicken SiO2 Schicht und die 2.000 Å dicken Si3N4 Schicht mit einem RIE verarbeiten. (j) DRIE das Siliziumsubstrat 450 µm von der Rückseite des Wafers. (k) nass-Ätzen der SiO2 Schicht auf die Al-Elektroden und den Seitenwänden der dielektrischen Säulen. (l) Eindringen von Silizium-Substrat von vorne durch einen DRIE-Prozess. Beachten Sie, dass die Schaltpläne sind nicht maßstabsgetreu. Bitte klicken Sie hier für eine größere Version dieser Figur.
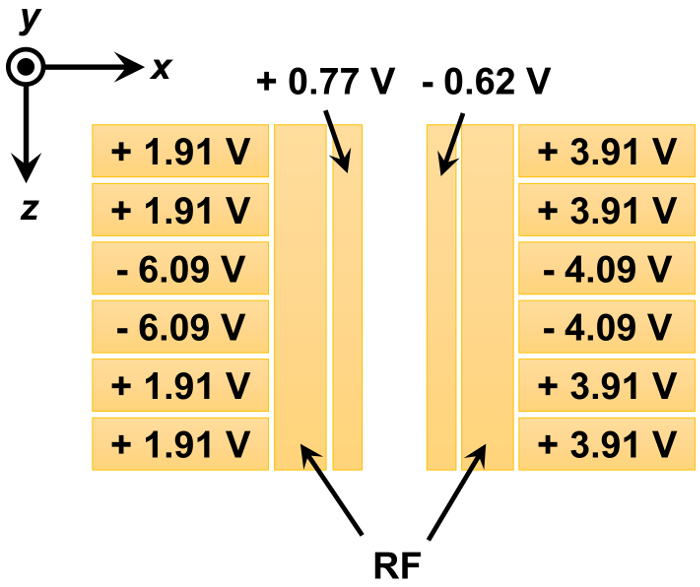
Abbildung 4: ein Beispiel für die DC-Spannung gesetzt verwendet, um Ionen trap. Die Spannungen auf die Innenschienen angewendet können das asymmetrische elektrische Feld in horizontaler Richtung der Hauptachsen des Gesamtpotenzials in der Querebene kippen kompensieren. Die axiale Falle Frequenz von eingestellten Spannung erzeugt wurde 550 kHz. Bitte klicken Sie hier für eine größere Version dieser Figur.
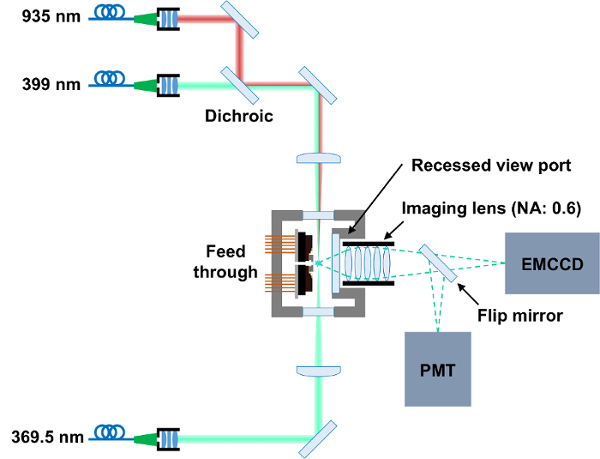
Abbildung 5: Schema des optischen Aufbaus. Drei Diodenlaser sind so ausgerichtet, an der Trapping-Position überlappen. Versenkte Ansichtsfenster der UHV-Kammer ermöglicht die Bildbearbeitung Objektiv platziert werden so nah wie möglich an den Chip-Oberfläche. Eine Spiegel platziert zwischen dem bildgebenden Objektiv und der EMCCD ermöglicht die gezielte Überwachung der Ionen-Fluoreszenz mit entweder einem Photon multipliziert Schlauch (PMT) oder einer EMCCD. Bitte klicken Sie hier für eine größere Version dieser Figur.

Abbildung 6: Bilder von der konstruierten optischen Aufbau. (ein) A Spule wird gewickelt, um das vordere Ansichtsfenster der Kammer zur Erzeugung eines Magnetfeldes, das entartete Energieniveaus von Ytterbium Ionen brechen kann. (b) der optische Aufbau für die Lenkung der 399 nm und 935 nm Balken. Die roten und grünen Linien geben den Strahlengang der 935 nm und 399 nm Laser, beziehungsweise. (c) die Konfiguration der Imaging Systems, einschließlich der Spiegel, der bildgebenden Linse, die EMCCD und die Zlg. Der Weg der von den Gefangenen Ionen emittiert Fluoreszenz kann von der Spiegel bestimmt werden. Die grün-weißen Pfeile zeigen den Weg der Fluoreszenz, wenn durch die EMCCD und der PMT bzw. überwacht werden. Bitte klicken Sie hier für eine größere Version dieser Figur.
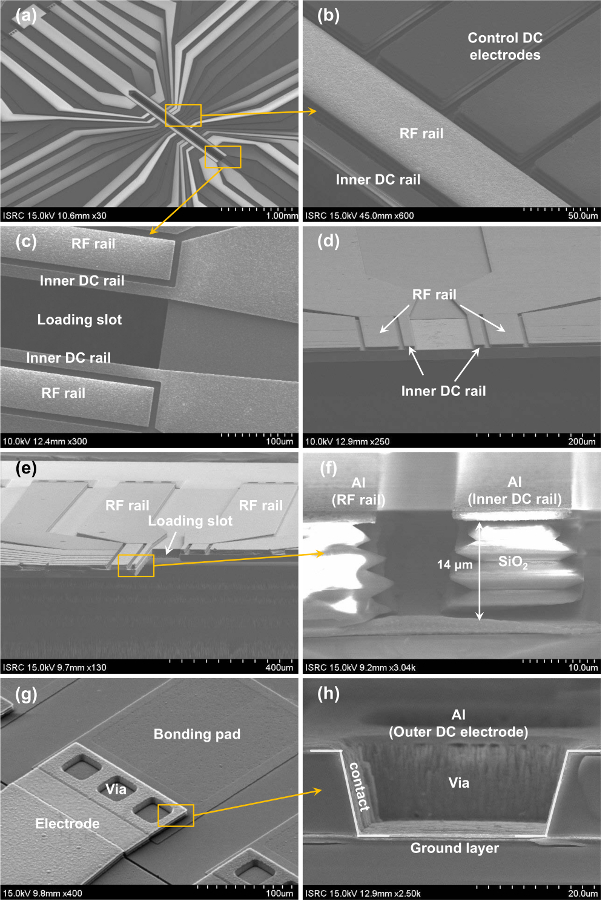
Abbildung 7: Herstellung Ergebnisse der Oberfläche Ionenfallen. (ein) Überblick über das Chip-Layout. (b) einer vergrößerten Ansicht des Chip-Layout, das mehrere äußere DC Elektroden zeigt. (c) einer vergrößerten Ansicht des Chip-Layout, das den Ladeschlitz zeigt. (d) eine Cross-sectional Blick auf die Trapping-Region vor dem Eindringen der Ladeschlitz. (e) eine Cross-sectional Blick auf die Trapping-Region nach Eindringen der Ladeschlitz. (f) A vergrößert Querschnittsansicht der Oxid-Säule. Die Oxid-Säulen haben Wände gezackt und die Längen des Überhangs reichen nicht aus, die die ungleichmäßige Etch-Rate der SiO2 an den Schnittstellen zwischen den separat hinterlegten 3,5 µm dicken SiO2 Schichten zugeschrieben wird. (g) A Draufsicht eines Drahtbonden Pads einer DC-Elektrode. (h) A Querschnittsansicht einer über. Geneigte Profile der Oxid-Säulen ermöglichen die Verbindung von der DC-Elektrode und die Grundebene während der Abscheidung der Al-Schicht auf der Seitenwand der Oxid-Säule statt Füllung der durch Löcher mit einem galvanischen Prozess. Bitte klicken Sie hier für eine größere Version dieser Figur.
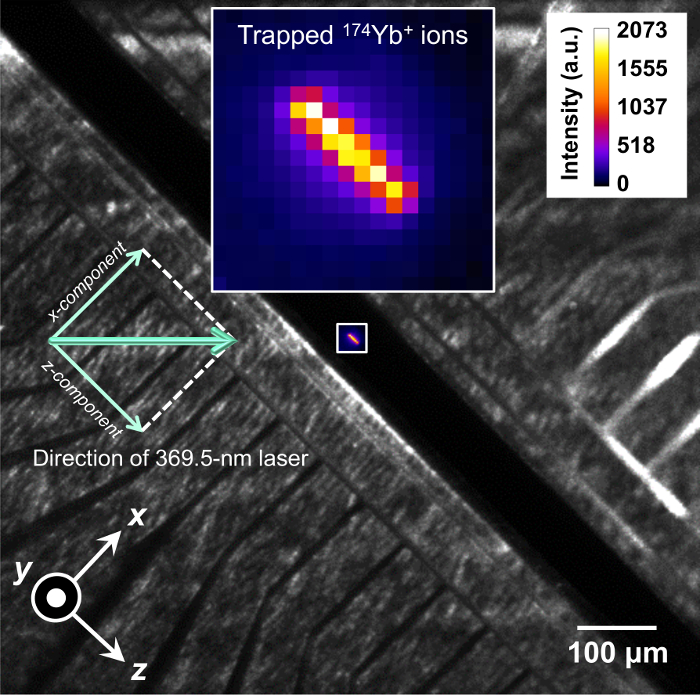
Abbildung 8: ein EMCCD Bild von fünf 174Yb+ Ionen gefangen auf dem Microfabricated Ionenfallen Chip. Das Bild von der Oberfläche Falle Elektrodenstruktur separat gemacht wurde, und die Bilder des eingeschlossenen Ions und der Elektroden wurden aus Gründen der Übersichtlichkeit kombiniert. Die Intensität Legende bezieht sich nur auf die Pixel in das Feld ein. Der Dicke Pfeil zeigt den Strahlengang des 369.5 nm Lasers und die dünne Pfeile stellen die X - und Z-Komponenten den Impuls des Photons. Bitte klicken Sie hier für eine größere Version dieser Figur.

Abbildung 9: Anpassung des axialen Potenzials der Gefangenen Ionen in einer linearen Kette. (ein) sieben Ionen in der Mitte der Falle. (b) die Ionen wurden geshuttelt zehn Mikrometern. (c) drückte die Ionen-Zeichenfolge in axialer Richtung. Diese Zahl ist am besten als einen Film angesehen, die separat hochgeladen ist. Bitte klicken Sie hier für eine größere Version dieser Figur.

Abbildung 10: Experimentelle Ergebnisse von Rabi Schwingungen zwischen den | 0  und | 1
und | 1  Staaten. | 0
Staaten. | 0 ist definiert als die 2S-1/2| F = 0, mF= 0
ist definiert als die 2S-1/2| F = 0, mF= 0 Stand der 171Yb+ Ion, und | 1
Stand der 171Yb+ Ion, und | 1 ist definiert als die 2S-1/2| F = 1, mF= 0
ist definiert als die 2S-1/2| F = 1, mF= 0 Stand. Die Rabi Schwingung wird durch ein 12,6428-GHz-Mikrowellen induziert. Bloch-Kugeln über die Handlung zeigen die entsprechenden Quantenzustände zu unterschiedlichen Zeiten. Bitte klicken Sie hier für eine größere Version dieser Figur.
Stand. Die Rabi Schwingung wird durch ein 12,6428-GHz-Mikrowellen induziert. Bloch-Kugeln über die Handlung zeigen die entsprechenden Quantenzustände zu unterschiedlichen Zeiten. Bitte klicken Sie hier für eine größere Version dieser Figur.
Ergänzende Dokument: Klicken Sie bitte hier, um dieses Dokument zu downloaden.
Diskussion
Dieser Vortrag ist einer Methode für die Fallenjagd Ionen mit Microfabricated Oberfläche Ionenfallen. Der Bau eines Ion-Trapping-Systems erfordert Erfahrungen in verschiedenen Forschungsbereichen aber zuvor nicht im Detail beschrieben. Dieses Papier detaillierte Verfahren vorgesehenen Microfabricating eine Falle-Chip sowie für Bau Versuchsaufbaus zu Ionen zum ersten Mal zu fangen. Dieses Papier hat auch detaillierte Verfahren zur Überfüllung 174Yb+ Ionen und experimentieren mit Gefangenen Ionen.
Ein erhebliches Hindernis konfrontiert in den Microfabrication Verfahren ist die Ablagerung von der dielektrischen Schicht mit einer Dicke von mehr als 10 µm. Während der Abscheidung der dicken dielektrische Schicht kann Eigenspannungen aufzubauen, das beschädigen der dielektrischen Film oder "kantig" den Wafer. Um die Restspannung zu verringern, die in der Regel Druckfestigkeit ist, sollte eine langsame Abscheidungsrate verwendeten40sein. In unserem Fall wurde eine Druckspannung von 110,4 MPa mit der Abscheidungsbedingungen von 540 Sccm SiH-4 -Gas-Durchfluss, 140 W RF Power und 1,9 Torr Druck bei 5 µm Schichtdicke gemessen. Diese Bedingungen stellen jedoch nur eine grobe Referenz, da diese Bedingungen für verschiedene Geräte erheblich variieren können. Um die Auswirkungen der angesammelten Stress zu reduzieren, wurden 3,5 µm dicken SiO2 Filme abwechselnd auf beiden Seiten des Wafers in die vorgestellte Methode hinterlegt. Die gewünschte Dicke der dielektrischen Schicht reduziert werden, wenn eine kleinere Amplitude der RF-Spannung und damit eine flachere Falle Tiefe gewählt. Flachere Falle Tiefe führt jedoch leicht zu die Flucht der Gefangenen Ionen, so ist die Herstellung von dickeren Dielektrische Schichten, die höhere RF Spannungen standhalten, wünschenswerter.
Es gibt einige Einschränkungen, die Herstellungsverfahren, die in diesem Dokument vorgestellt. Die Längen der die Überhänge sind nicht ausreichend, die dielektrische Seitenwände aus den Gefangenen Ionen vollständig auszublenden, wie in Abbildung 7fgezeigt. Darüber hinaus sind die Seitenwände der Oxid Säulen gezackt, Erhöhung der exponierten Bereich der dielektrischen Seitenwände im Vergleich zu der vertikalen Oxid-Säule. Beispielsweise wird bei der Seitenwand der inneren DC Schiene in der Nähe der Ladeschlitz mit einem einheitlichen Überhang von 5 µm berechnet, dass 33 % der dielektrischen Fläche die eingeschlossene Ion Position der vertikalen Seitenwand ausgesetzt ist. Im Fall von jagged Edge ist mehr als 70 % des Gebiets Seitenwand ausgesetzt. Diese nicht-ideale Herstellung Ergebnisse zusätzliche Streufelder von exponierten Dielektrika induzieren können, aber die Effekte nicht quantitativ gemessen. Dennoch hat der gefertigte Chip wie berichtet im Ion-Trapping und Qubit Manipulation Experimente erfolgreich eingesetzt. Darüber hinaus hat die Falle Chip präsentiert in diesem Papier Silizium Seitenwände in der Nähe der Ladeschlitz ausgesetzt. Native Oxid kann auf die Silizium-Oberflächen und kann dazu führen, dass zusätzliche Streufelder. Daher empfiehlt es sich, die Silizium-Substrat mit einer zusätzlichen metallischen Schicht, wie in33zu schützen.
Um 174Yb+ Ionen zu fangen, die Frequenzen der Laser innerhalb von ein paar Dutzend MHz stabilisiert werden sollte, und ein paar verschiedene Methoden werden in den erweiterten Einstellungen38,41diskutiert. Ist jedoch für die einfache Einrichtung diskutiert in diesem Papier, erste Trapping möglich nur mit einer Stabilisierung mit einer Wellenlänge Meter.
Dieses Papier zur Verfügung gestellt ein Protokoll um 174Yb+ -Ionen mit einer Microfabricated Oberfläche Ionenfallen-Chip zu fangen. Obwohl das Protokoll für das Einfangen von 171Yb+ Ionen nicht konkret diskutiert, die in diesem Dokument beschriebenen Versuchsaufbau auch 171Yb+ Ionen zu fangen und den Qubit-Zustand der 171 manipulieren einsetzbar Yb+ -Ionen zu Rabi Oszillation Ergebnissen (siehe Abbildung 10). Dies kann durch das Hinzufügen von mehreren optischen Modulatoren für die Ausgabe der Laser und mithilfe von eine Mikrowelle-Setup wie in Zusatzdokumentbeschrieben erfolgen.
Zusammenfassend können der experimentellen Methoden und Ergebnisse, die in diesem Papier verwendet werden, verschiedene Quanten Informationsanwendungen mit Oberfläche Ionenfallen zu entwickeln.
Offenlegungen
Die Autoren haben nichts preisgeben.
Danksagungen
Diese Forschung wurde durch das Ministerium für Wissenschaft, IKT, teilweise unterstützt und Zukunft planen (MSIP), Korea, unter Information Technology Research Center (ITRC) Unterstützung Programm (IITP-2017-2015-0-00385) und ICT R & D-Programm (10043464, Entwicklung von Quanten-Repeater-Technologie für die Anwendung auf Kommunikationssysteme), betreut vom Institut für Informationen & Communications Technology Promotion (IITP).
Materialien
| Name | Company | Catalog Number | Comments |
| photoresist used for 2-μm spin coating | AZ Materials | AZ7220 | Discontinued. Easily replaced by other alternative photoresist product. |
| photoresist used for 6-μm spin coating | AZ Materials | AZ4620 | Discontinued. Easily replaced by other alternative photoresist product. |
| ceramic chip carrier | NTK | IPKX0F1-8180BA | |
| epoxy compound | Epotek | 353ND | |
| Plasma enhanced chemical vapor deposition (PECVD) system | Oxford Instruments | PlasmaPro System100 | |
| Low pressure chemical vapor deposition (LPCVD) system | Centrotherm | E-1200 | |
| Furnace | Seltron | SHF-150 | |
| Sputter | Muhan Vacuum | MHS-1500 | |
| Manual aligner | Karl-Suss | MA-6 | |
| Deep Si etcher | Plasma-Therm | SLR-770-10R-B | |
| Inductive coupled plasma (ICP) etcher | Oxford Instruments | PlasmaPro System100 Cobra | |
| Reactive ion etching (RIE) etcher | Applied Materials | P-5000 | |
| Boundary element method (BEM) software | CPO Ltd. | Charged Particle Optics | |
| Single crystaline (100) silicon wafer | STC | 4SWP02 | 100 mm / (100) / P-type / SSP / 525±25 μm |
| metal tubes | Mcmaster-carr | 89935K69 | 316 Stainless Steel Tubing, 0.042" OD, 0.004" Wall Thickness |
| Yb piece | Goodfellow | YB005110 | Ytterbium wire, purity 99.9% |
| enriched 171Yb | Oak Ridge National Laboratory | Yb-171 | https://www.isotopes.gov/catalog/product.php?element=Ytterbium |
| tantalum foil | The Nilaco Corporation | TI-453401 | 0.25x130x100mm 99.5% |
| Kapton-insulated copper wire | Accu-glass | 18AWG (silver plated copper wire kapton insulted) | |
| residual gas analyzer (RGA) | SRS | RGA200 | |
| turbo pump | Agilent | Twistorr84 FS | |
| all-metal valve | KJL | manual SS All-Metal Angle Valves (CF flanged) | |
| Leak detector (used as a rough pump) | Varian | PD03 | |
| ion gauges | Agilent | UHV-24p | |
| ion pump | Agilent | VacIon Plus 20 | |
| NEG pump | SAES Getters | CapaciTorr D400 | |
| spherical octagon | Kimball Physics | MCF600-SphOct-F2C8 | |
| ZIF socket | Tactic Electronics | P/N 100-4680-002A | |
| multi-pin feedthroughs | Accu-Glass | 6-100531 | |
| 25 D-sub gender adapters | Accu-Glass | 104101 | |
| Recessed viewport | Culham Centre for Fusion Energy | 100CF 316LN+20.9 Re-Entrant 316 (Custom order) | Disc material: 60cv Fused Silica 4mm THK, TWE Lambda 1/10, 20/10 Scratch-Dig |
| Recessed viewport AR coating | LaserOptik | AR355nm/0-6° HT370-650nm/0-36° on UHV (Custom order) | AR coating was performed in the middle of the fabrication of the recessed viewport |
| Digital-analog converter | AdLink | PCIe-6216V-GL | |
| 369.5nm laser | Toptica | TA-SHG Pro | |
| 369.5nm laser | Moglabs | ECD004 + 370LD10 + DLC102/HC | |
| 399nm laser | Toptica | DL 100 | |
| 935nm laser | Toptica | DL 100 | |
| 369.5nm & 399nm optical fiber | Coherent | NUV-320-K1 | Patch cables are connectorized by Costal Connections. |
| 935nm optical fiber | GouldFiber Optics | PSK-000626 | 50/50 fiber beam splitter made of Corning HI-780 single mode fiber to combine 935nm and 638nm together. |
| Wavelength meter | High Finesse | WSU-2 | |
| temporary mirror | Thorlabs | PF10-03-P01 | |
| Dichroic mirror | Semrock | FF647-SDi01-25x36 | |
| 369.5nm & 399nm collimator | Micro Laser Systems | FC5-UV-T/A | |
| 935nm collimator | Schäfter + Kirchhoff | 60FC-0-M8-10 | |
| 369.5nm focusing lens | CVI | PLCX-25.4-77.3-UV-355-399 | Focal length: ~163mm @ 369.5nm |
| 399nm & 935nm focusing lens | CVI | PLCX-25.4-64.4-UV-355-399 | Focal length: ~137mm @ 399nm, ~143mm @ 935nm |
| imaging lens | Photon Gear | P/N 15470 | |
| 369.5nm bandpass filter | Semrock | FF01-370/6-25 | |
| 399nm bandpass filter | Semrock | FF01-395/11-25 | |
| IR filter | Semrock | FF01-650/SP-25 | |
| EMCCD camera | Andor Technology | DU-897U-CS0-EXF | |
| PMT | Hamamatsu | H10682-210 |
Referenzen
- Wineland, D. J. Nobel Lecture: Superposition, entanglement, and raising Schrödinger's cat. Rev Mod Phys. 85 (3), 1103 (2013).
- Blatt, R., Wineland, D. Entangled states of trapped atomic ions. Nature. 453 (7198), 1008-1015 (2008).
- Leibfried, D., Blatt, R., Monroe, C., Wineland, D. Quantum dynamics of single trapped ions. Rev Mod Phys. 75 (1), 281 (2003).
- Paul, W. Electromagnetic traps for charged and neutral particles. Rev Mod Phys. 62 (3), 531 (1990).
- Rosenband, T., et al. Frequency ratio of Al+ and Hg+ single-ion optical clocks; metrology at the 17th decimal place. Science. 319 (5871), 1808-1812 (2008).
- Dawson, P. H. . Quadrupole mass spectrometry and its applications. , (2013).
- Ladd, T. D., Jelezko, F., Laflamme, R., Nakamura, Y., Monroe, C., O'Brien, J. L. Quantum computers. Nature. 464 (7285), 45-53 (2010).
- Monz, T., et al. Realization of a scalable Shor algorithm. Science. 351 (6277), 1068-1070 (2016).
- Debnath, S., Linke, N. M., Figgatt, C., Landsman, K. A., Wright, K., Monroe, C. Demonstration of a small programmable quantum computer with atomic qubits. Nature. 536 (7614), 63-66 (2016).
- Blatt, R., Roos, C. F. Quantum simulations with trapped ions. Nature Phys. 8 (4), 277-284 (2012).
- Kielpinski, D., Monroe, C., Wineland, D. J. Architecture for a large-scale ion-trap quantum computer. Nature. 417 (6890), 709-711 (2002).
- Moehring, D. L., et al. Design, fabrication and experimental demonstration of junction surface ion traps. New J Phys. 13 (7), 075018 (2011).
- Wright, K., et al. Reliable transport through a microfabricated X-junction surface-electrode ion trap. New J Phys. 15 (3), 033004 (2013).
- Amini, J. M., et al. Toward scalable ion traps for quantum information processing. New J Phys. 12 (3), 033031 (2010).
- Sterling, R. C., et al. Fabrication and operation of a two-dimensional ion-trap lattice on a high-voltage microchip. Nat Commun. 5, (2014).
- Kumph, M., et al. Operation of a planar-electrode ion-trap array with adjustable RF electrodes. New J Phys. 18 (2), 023047 (2016).
- Mielenz, M., et al. Arrays of individually controlled ions suitable for two-dimensional quantum simulations. Nat Commun. 7, (2016).
- Stick, D., Hensinger, W. K., Olmschenk, S., Madsen, M. J., Schwab, K., Monroe, C. Ion trap in a semiconductor chip. Nat Phys. 2 (1), 36-39 (2006).
- Harty, T. P., et al. High-fidelity preparation, gates, memory, and readout of a trapped-ion quantum bit. Phys Rev Lett. 113 (22), 220501 (2014).
- Cho, D., Hong, S., Lee, M., Kim, T. A review of silicon microfabricated ion traps for quantum information processing. Micro Nano Sys Lett. 3 (1), 1-12 (2015).
- Weidt, S., et al. Trapped-ion quantum logic with global radiation fields. Phys Rev Lett. 117 (22), 220501 (2016).
- Monroe, C., Kim, J. Scaling the ion trap quantum processor. Science. 339 (6124), 1164-1169 (2013).
- Brown, K. R., Kim, J., Monroe, C. Co-designing a scalable quantum computer with trapped atomic ions. npj Quantum Inf. 2, 16034 (2016).
- Lekitsch, B., et al. Blueprint for a microwave trapped-ion quantum computer. Science Adv. 3 (2), e1601540 (2017).
- Reichel, J., Vuletic, V. . Atom chips. , (2011).
- Ghosh, P. K., ed, ,. 1. s. t. . Ion Traps. , (1995).
- Wesenberg, J. H. Electrostatics of surface-electrode ion traps. Phys Rev A. 78 (6), 063410 (2008).
- House, M. G. Analytic model for electrostatic fields in surface-electrode ion traps. Phys Rev A. 78 (3), 033402 (2008).
- Hong, S., Lee, M., Cheon, H., Kim, T., Cho, D. I. Guidelines for Designing Surface Ion Traps Using the Boundary Element Method. Sensors. 16 (5), 616 (2016).
- Allcock, D. T. C., et al. Implementation of a symmetric surface-electrode ion trap with field compensation using a modulated Raman effect. New J Phys. 12 (5), 053026 (2010).
- Chiaverini, J., et al. Surface-electrode architecture for ion-trap quantum information processing. Quantum Inf Comput. 5 (6), 419-439 (2005).
- Allcock, D. T. C., et al. Heating rate and electrode charging measurements in a scalable, microfabricated, surface-electrode ion trap. Appl Phys B. 107 (4), 913-919 (2012).
- . Demonstration of a microfabricated surface electrode ion trap Available from: https://arxiv.org/abs/1008.0990 (2010)
- Allcock, D. T. C., et al. Reduction of heating rate in a microfabricated ion trap by pulsed-laser cleaning. New J Phys. 13 (12), 123023 (2011).
- Mount, E., et al. Single qubit manipulation in a microfabricated surface electrode ion trap. New J Phys. 15 (9), 093018 (2013).
- Siverns, J. D., Simkins, L. R., Weidt, S., Hensinger, W. K. On the application of radio frequency voltages to ion traps via helical resonators. Appl Phys B. 107 (4), 921-934 (2012).
- Kleinert, M., Dahl, M. E. G., Bergeson, S. Measurement of the Yb I 1S0−1P1 transition frequency at 399 nm using an optical frequency comb. Phys Rev A. 94 (5), 052511 (2016).
- Olmschenk, S., Younge, K. C., Moehring, D. L., Matsukevich, D. N., Maunz, P., Monroe, C. Manipulation and detection of a trapped Yb+ hyperfine qubit. Phys Rev A. 76 (5), 052314 (2007).
- Sansonetti, J. E., Martin, W. C., Young, S. L. . Handbook of Basic Atomic Spectroscopic Data. , (2013).
- Kern, W. . Thin film processes II. , (2012).
- Streed, E. W., Weinhold, T. J., Kielpinski, D. Frequency stabilization of an ultraviolet laser to ions in a discharge. Appl Phys Lett. 93 (7), 071103 (2008).
Nachdrucke und Genehmigungen
Genehmigung beantragen, um den Text oder die Abbildungen dieses JoVE-Artikels zu verwenden
Genehmigung beantragenThis article has been published
Video Coming Soon
Copyright © 2025 MyJoVE Corporation. Alle Rechte vorbehalten