Method Article
Métodos experimentales para atrapar iones usando recientemente trampas de iones de la superficie
En este artículo
Resumen
Este trabajo presenta una metodología de microfabricación para superficie trampas de iones, así como un procedimiento experimental detallado para los iones del iterbio reventado en un ambiente de temperatura.
Resumen
Iones atrapados en un cuadrupolo, trampa de Paul se han considerado uno de los fuertes candidatos físicos para implementar el procesamiento de la información cuántica. Esto es debido a su tiempo largo de coherencia y su capacidad para manipular y detectar bits individuales cuánticos (qubits). En los últimos años, trampas de iones superficiales recientemente han recibido más atención para las plataformas de qubit integrado a gran escala. Este trabajo presenta una metodología de microfabricación para trampas de iones con tecnología de sistemas micro electromecánicos (MEMS), incluyendo el método de fabricación de una capa dieléctrica μm de espesor y metal 14 proyección estructuras encima de la capa dieléctrica. Además, un procedimiento experimental para la captura de iterbio (Yb) iones del isótopo 174 (174Yb+) usando 369.5 nm, 399 nm, y láseres de diodo de 935 nm se describe. Estas metodologías y procedimientos implican muchas disciplinas científicas y de ingeniería, y en primer lugar se presenta los procedimientos experimentales detallados. Los métodos tratados en este trabajo se pueden extender fácilmente a la captura de iones Yb del isótopo 171 (171Yb+) y a la manipulación de qubits.
Introducción
Una trampa de Paul puede confinar las partículas cargadas, como los iones en el espacio vacío, usando una combinación de un campo eléctrico estático y un campo eléctrico variable oscilante de radio frecuencia (RF), y los estados cuánticos de los confinados en la trampa de iones puede ser medidos y controlado1,2,3. Tales trampas de iones fueron desarrolladas originalmente para aplicaciones de medición precisa, incluyendo relojes de ópticas y espectroscopía de masas4,5,6. En los últimos años, estas trampas de iones también se han activamente exploradas como una plataforma física para implementar el procesamiento de la información cuántica atribuida a las características deseables de iones atrapados, como largos tiempos de coherencia, aislamiento ideal en una altísima vacío (UHV) medio ambiente y la viabilidad de cada qubit manipulación7,8,9,10. Desde Kielpinski et al. 11 propone una arquitectura escalable de trampa de iones que puede utilizarse para el desarrollo de ordenadores cuánticos, varios tipos de trampas superficiales, incluyendo conexiones trampas12,13, varias zonas trampa fichas14y matriz 2-d se han desarrollado trampas15,16,17, usando semiconductores derivados del proceso de microfabricación métodos18,19,20,21 . Información cuántica a gran escala sistemas basados en la superficie de procesamiento trampas han sido discutido22,23,24.
Este documento presenta métodos experimentales para los iones de la captura con trampas de iones superficiales recientemente. Más específicamente, se describe un procedimiento para la fabricación de trampas de iones superficiales y un procedimiento detallado para los iones de captura con trampas fabricadas. Además, se proporcionan descripciones detalladas de varias técnicas prácticas para configurar el sistema experimental y atrapando los iones en el Documento complementario.
La metodología de microfabricating una superficie trampa de iones se da en el paso 1. La figura 1 muestra un esquema simplificado de una trampa de iones superficial. Los campos eléctricos generados por el voltaje aplicado a los electrodos en el plano transversal se muestran también25. Una tensión de RF se aplica al par de los electrodos de RF, mientras todos los otros electrodos se mantienen en tierra de RF; potencial de ponderomotive26 generado por la tensión de RF limita los iones en la dirección radial. El voltaje de corriente directa (DC) aplicado a los múltiples electrodos DC fuera de los electrodos de RF confinar los iones en la dirección longitudinal. Los rieles interiores entre los electrodos de RF están diseñados para ayudar a la inclinación de los ejes principales del potencial total en el plano transversal. La metodología para el diseño de un sistema de voltaje de DC está incluida en el Documento complementario. Además, pueden encontrarse más detalles para el diseño de los parámetros geométricos esenciales de fichas de trampa de iones superficiales en27,28,,29,30,31.
El método de fabricación introducido en el paso 1 fue diseñado teniendo en cuenta los siguientes aspectos. En primer lugar, la capa de dieléctrico entre la capa de electrodo y la capa de tierra debe ser suficientemente gruesa para evitar la avería eléctrica entre las capas. Generalmente, el espesor debe ser sobre 10. Durante la deposición de la capa dieléctrica, la tensión residual de las películas depositadas puede causar arqueamiento de los daños a las películas depositadas o sustrato. Así, el control de la tensión residual es una de las técnicas claves en la fabricación de las trampas de iones superficiales. En segundo lugar, debe minimizarse la exposición de las superficies dieléctricas en la posición de iones debido a los cargos pueden ser inducidos en el material dieléctrico por láser dispersa radiación ultravioleta (UV), que en los resultados de vuelta en un cambio aleatorio del ion de la posición. El área expuesta puede reducirse mediante el diseño de estructuras de electrodo de proyección. Se ha reportado que la superficie trampas de iones con electrodos voladizos son resistentes a la carga bajo condiciones experimentales típicos32. Tercero, todos los materiales, incluyendo varias películas depositadas, deben ser capaces de soportar 200 ° C para hornear durante aproximadamente 2 semanas, y la cantidad de emisión de gases de todos los materiales debe ser compatible con medioambientes con UHV. El diseño de la superficie de trampa de iones chips recientemente en este trabajo se basa en el diseño de trampa de33, que fue utilizado con éxito en varios experimentos32,de33,34, 35. tenga en cuenta que este diseño incluye una ranura en el medio de la viruta para carga de átomos neutrales, que son más adelante foto ionizado para la captura.
Después de la fabricación de la viruta de trampa de iones, el chip es montado y conectado eléctricamente al portador de viruta con hilos de oro de la vinculación. El chip se instala entonces en una cámara UHV. Un procedimiento detallado para la preparación de un paquete de la viruta de la trampa y el diseño de la cámara UHV se proporcionan en el Documento complementario.
Preparación de los equipos ópticos y eléctricos, así como los procedimientos experimentales para iones de reventado, se explican en detalle en el paso 2. Los iones atrapados por el ponderomotive potenciales son generalmente sujetos a las fluctuaciones del campo eléctrico circundante, que continuamente aumenta la energía cinética media de los iones. Láser de refrigeración basado en cambio de Doppler se puede utilizar para quitar el exceso de energía de movimiento de los iones. La figura 2 muestra los diagramas de nivel de energía simplificados de un ion de Yb+ 174y un átomo neutro 174del Yb. Enfriamiento Doppler de iones de 174Yb+ requiere un láser 369,5 y un láser 935, mientras que la foto-ionización de los átomos de Yb neutral 174requiere un láser 399. Pasos 2.2 y 2.3 describen un método eficiente para alinear estos láseres a la viruta superficie de trampa de iones y un procedimiento para encontrar las condiciones adecuadas para la fotoionización. Después se preparan los componentes ópticos y eléctricos, atrapando los iones es relativamente sencilla. Se presenta la secuencia experimental para los iones de la captura en el paso 2.4.
Protocolo
1. fabricación de la trampa de iones Chip paquete
- microfabricación de la viruta superficie de trampa de iones.
Nota: Las condiciones del proceso descritas en esta sección proporcionan sólo una referencia aproximada, ya que los parámetros óptimos para cada proceso pueden variar considerablemente para diferentes equipos. Las condiciones de temperatura se dan solamente para los procesos de alta temperatura, tales como oxidación y deposición de vapor químico. El proceso de fabricación se lleva a cabo utilizando obleas de silicio de 100 mm de diámetro.- Preparar un silicio cristalino único de la oblea con un grueso de 500-525 μm y limpiarla con solución Piraña para 15 min.
- Oxide térmicamente la oblea de silicio en un tubo para formar 0,5 μm de espesor SiO 2 dieléctricas capas en ambos lados del horno.
Nota: Estas capas pueden aislar eléctricamente el sustrato de silicio de la capa de tierra. Los parámetros de proceso utilizados en la oxidación húmeda fueron: O 2 flujo de 6.500 sccm, N 2 caudal 5.000 sccm, caudal de 2 H de 7.000 sccm, proceso temperatura de 900 ° C y proceso tiempo de 4.5 h (véase la tabla de Materiales para detalles de equipo). - Depósito de 0,2 μm de espesor Si 3 N 4 capas en ambos lados de la oblea mediante un proceso de deposición (LPCVD) de baja presión de vapor químico ( figura 3a) para proteger las capas de óxido térmico durante el proceso de producción mojado se muestra en la figura 3 k.
Nota: Los parámetros utilizados en el proceso LPCVD son: H 2 ISDC 2 caudal 30 sccm, NH 3 caudal 100 sccm, presión de 200 mTorr y temperatura del proceso de 785 ° C. Esto se traduce en una tasa de deposición de 40 Å / min (véase Tabla de materiales para detalles de equipo). - Depositar una capa de Al/Cu (1%) 1,5 μm de espesor de la oblea mediante un proceso de la farfulla y los siguientes parámetros: caudal de Ar de 40 sccm, presión de 2 mTorr y potencia de RF de 300 w.
Nota: Esto se traduce en una tasa de deposición de 130 Å / min (véase Tabla de materiales para detalles de equipo).
Nota: Esta capa proporciona un plano de tierra para evitar la pérdida de la RF por el sustrato de silicio y también proporciona puntos de contacto para los cojines de wire-bonding. La aleación de aluminio con 1% de cobre se utiliza para evitar la formación de la barba durante el proceso de cocción para lograr un ambiente UHV. Esta composición es esencial para la prevención de la barba. - Girar una capa de photoresist positivo de 2 μm de espesor de la oblea y litográfico del patrón para definir el RF Blindaje plano y almohadillas de wire-bonding.
Nota: Los parámetros de proceso para los 2 μm de espesor photoresist son: velocidad de 5.000 rpm de la vuelta, girar tiempo de 40 s, cueza al horno la temperatura de 95 ° C, hornear antes de tiempo de 90 s, exposición de energía de 144 mJ/cm 2, desarrollo de tiempo de 60 s, temperatura de horneado después de 110 ° C y tiempo de horneado después de 5 minutos (véase la Tabla de materiales para detalles de productos químicos y equipo). - Patrón el 1,5 μm de espesor Al/Cu (1%) la capa mediante un proceso convencional de seco-grabado (aguafuerte reactiva del ion (RIE) o grabado de plasma de acoplamiento inductivo (ICP)), con la fotoresistencia modelado en paso 1.1.5 como la máscara de la aguafuerte.
Nota: Un grabador de PIC debe utilizarse con los siguientes parámetros: BCl 3 caudal de 20 sccm, Cl 2 caudal de 30 sccm, presión de 5 mTorr y potencia de RF de 750 w. Esto se traduce en una tasa de etch de 3.600 Å/min (véase Tabla de materiales para detalles de equipo). - Quitar la fotoresistencia utilizado en el proceso de incineración de plasma paso 1.1.6 usung una O 2 ( figura 3b).
Nota: Los parámetros de proceso para el proceso de incineración son: caudal de O 2 de 150 sccm, presión de 0,75 mTorr y potencia de RF de 300 W (véase la Tabla de materiales para detalles de equipo). - Depositar una capa de 2 14 μm de espesor SiO en ambos lados de la oblea mediante procesos (PECVD) la deposición de vapor químico plasma-realzada ( Figura 3C).
Nota: Los parámetros utilizados en el proceso PECVD son: SiH 4 caudal de sccm 540, presión de 1,9 Torr, proceso temperatura de 350 ° C y potencia de RF de 750 w. Esto se traduce en una tasa de deposición de 3.000 Å / min (véase Tabla de materiales para detalles de equipo). Como depositar los 14 μm de espesor SiO 2 la capa es uno de los procesos más difíciles, los detalles están descritas a continuación en el debate. - Girar una capa de photoresist positivo de 6 μm de espesor en la parte frontal de la oblea y litográfico del patrón para definir a través de agujeros para conectar eléctricamente los electrodos DC a los pads de wire-bonding.
Nota: Los parámetros de proceso para la fotoresistencia μm de espesor 6 son: girar velocidad de 5.000 rpm, tiempo de 40 s, cueza al horno la temperatura de 95 ° C, tiempo de hornear antes de 5 minutos, exposición energía de 900 mJ/cm 2 de la vuelta, desarrollar tiempo de 10 min, después hornear a temperatura de 110 ° C y tiempo de horneado después de 5 minutos (véase la Tabla de materiales para detalles de productos químicos y equipo). - Patrón el 14 μm de espesor SiO 2 la capa en la parte frontal de la oblea mediante un proceso convencional de RIE, con la fotoresistencia con dibujos en el paso 1.1.9 como la máscara de la aguafuerte.
Nota: Los parámetros de proceso para el SiO 2 grabado son: CHF 3 caudal 25 sccm, CF 4 caudal 5 sccm, caudal Ar 50 sccm, presión de 130 mTorr y potencia de RF de 600 w. Esto se traduce en una tasa de etch de 3.600 Å/min (véase Tabla de materiales para detalles de equipo). - Quitar la fotoresistencia en paso 1.1.10 con un proceso de incineración de plasma O 2. Sumerja la oblea en un disolvente caliente o someter a ultrasonidos antes de intermitentes ( Figura 3d).
- Girar una capa de photoresist positivo de 6 μm de espesor en la parte trasera de la oblea y litográfico del patrón para formar una máscara dura de óxido para aguafuerte reactiva profunda del ion (DRIE) de sustrato de silicio ( figura 3j).
- Patrón el 14 μm de espesor SiO 2 capas en la parte trasera de la oblea con un proceso convencional de la RIE, el photoresist modelado en paso 1.1.12 como la máscara de la aguafuerte.
- Quitar la fotoresistencia en paso 1.1.13 con un proceso de incineración de plasma O 2 ( figura 3e).
- Depositar una capa de Al/Cu (1%) 1,5 μm de espesor, que se utiliza como electrodo usando un proceso de la farfulla.
- Depositar una capa de 2 1 μm de espesor SiO en la oblea usando un proceso PECVD ( figura 3f).
- Girar una capa de photoresist positivo de 2 μm de espesor de la oblea y litográfico del patrón para definir los electrodos.
- Patrón el 1,5 μm de espesor Al/Cu (1%) y 1 μm de espesor SiO 2 utilizando un ICP convencional aguafuerte el proceso, con la fotoresistencia con dibujos en el paso 1.1.17 como la máscara de la aguafuerte.
- Quitar la fotoresistencia en paso 1.1.18 con un proceso de incineración de plasma O 2 ( figura 3 g).
- Girar una capa de photoresist positivo de 6 μm de espesor de la oblea y litográfico del patrón para definir los patrones de Pilar de óxido μm de espesor 14.
- Patrón el 14 μm de espesor SiO 2 capas con un proceso convencional de la RIE, el photoresist modelado en paso 1.1.20 como la máscara de la aguafuerte.
- Quitar la fotoresistencia en paso 1.1.21 con un proceso de incineración de plasma O 2 ( figura 3 h).
- Girar una capa de photoresist positivo de 6 μm de espesor de la oblea y litográfico para exponer la ranura de carga patrón.
- SiO 2 del patrón y procesan de Si 3 N 4 capas usando un RIE convencional, con la fotoresistencia con dibujos en el paso 1.1.23 como la máscara de la aguafuerte.
- Quitar la fotoresistencia en paso 1.1.24 con un proceso de incineración de plasma O 2 ( figura 3i).
- Patrón el sustrato de silicio de la parte trasera de la oblea mediante un proceso DRIE ( figura 3j).
Nota: La profundidad del grabado de pistas se debe medir repetidamente para evitar la penetración del sustrato de silicio de la parte trasera. El objetivo de grabar profundidad es aproximadamente de 450-470 μm. El proceso DRIE se realizó con iteraciones de deposición de 8 C 4 F 5 s, C 4 F 8 etch para 3 s y Si grabar durante 5 s. En el paso C 4 F 8 deposición, las tasas de flujo de C 4 F 8, SF 6 y Ar fueron 100, 0,5 y 30 sccm, respectivamente. Tenga en cuenta que la Ar se utiliza para acelerar la tasa de etch de C 4 F 8 y Si, pero también se aplica en el paso C 4 F 8 deposición, con el mismo caudal, para estabilizar la condición de presión. En el C 4 F 8 etch paso, los caudales fueron cambiados a 0.5, 50 y 30 sccm, respectivamente. En el S.i etch paso, caudales de 0.5 y 100 sccm 30, respectivamente, fueron utilizados. La potencia de RF y la presión de la cámara fijaron a 825 W y 23 mTorr en todas las etapas. Para estas condiciones, la tasa de etch del Si fue 1 μm para cada ciclo (véase la Tabla de materiales para detalles de equipo). - Cortar la oblea en piezas de 10 mm x 10 mm utilizando una máquina de cortar dados.
- Separar la cinta de corte en cuadritos de mueren por inmersión en acetona por 5 minutos limpiar el dado sumergiéndola en agua desionizada (DI) de marcha por 10 minutos y alcohol isopropílico (IPA) durante 2 minutos secarlo durante 2 min a 110 ° C.
- Etch las paredes laterales de los pilares de óxido para fabricar estructuras de proyección de electrodo con un mojado de óxido grabado proceso por 60 s en un grabador de óxido tamponado (BOE), que es (NH 4 F:HF = 6:1) ( figura 3 k). Limpiar el muere por inmersión en agua de DI por 10 min y API para 2 minutos secarlo durante 2 min a 110 ° C.
- Penetrar el ión en forma de rendija orificio de carga de la parte delantera de la matriz mediante un proceso DRIE.
Nota: El proceso de fabricación de los chips de trampa de iones es completo en este paso ( figura 3 l).
2. Elaboración de aparatos eléctricos y ópticos y atrapando los iones
Nota: el chip fabricado trampa está empaquetado con un portador del chip y el chip se instala en una cámara UHV. Mientras que los procedimientos para la fabricación del paquete trampa-chip y para preparar la cámara UHV se proporcionan en el Documento complementario, esta sección describe los detalles de configuración de equipo óptico y eléctrico y para los iones reventado.
- Preparación de conexiones eléctricas.
- Conectar un convertidor de analógico a digital de multicanal (DAC) para el paso en la parte trasera de la cámara UHV para aplicar tensión a los electrodos de control DC correspondientes.
Nota: La figura 4 muestra un ejemplo de la tensión aplicada a la viruta de la trampa. El método detallado para el diseño de tal un conjunto de voltaje DC se describe en el Documento complementario. - Conectar una fuente de corriente con un conector de horno en el paso atrás.
- Añadir un acoplador direccional entre un generador de RF y el resonador helicoidal. Conecte la señal desde el generador de RF para el puerto de salida del acoplador direccional. También, conecte el puerto de entrada del acoplador direccional al puerto de entrada del resonador helicoidal.
Nota: Esta configuración permite monitoreo de la potencia reflejada desde el resonador helicoidal 36. - Ajustar la posición de la tapa del resonador helicoidal y analizar la frecuencia del generador para encontrar la frecuencia en que la reflexión es mínimo. Repita este paso hasta que se encuentra el mínimo global.
Nota: La frecuencia en el mínimo global es la frecuencia resonante. Uso de un analizador de espectro con un generador de seguimiento opción o medida del parámetro 11 S con un analizador de red puede simplificar el proceso de digitalización para la mínima reflexión. Si cualquiera de las conexiones eléctricas con una fuente de voltaje DAC o fuente de corriente para que el horno se modifica, se modifica la impedancia del paso de la RF, y cambiará la frecuencia resonante. - Desactivar el generador RF.
PRECAUCIÓN: Cuando el resonador helicoidal es aplicar alto voltaje de RF a la trampa, no cambie las conexiones eléctricas que pueden causar cambios de impedancia. Cambios repentinos de la impedancia pueden grabar fácilmente los cables de unión de la viruta de.
- Conectar un convertidor de analógico a digital de multicanal (DAC) para el paso en la parte trasera de la cámara UHV para aplicar tensión a los electrodos de control DC correspondientes.
- Alineación de la 369.5 láser y el sistema de proyección de imagen.
- Colimar el 369,5-nm láser de fibra óptica usando un colimador y tratar de coincidir con la altura del colimador de la superficie de la mesa óptica a la altura del chip; hacen que la viga se propagan horizontalmente.
- Establecer la dirección de propagación del haz colimado 369,5 nm hacia el chip de la trampa, a través de la ventanilla izquierda o derecha de la cámara UHV, como se muestra en la figura 5. Alinearlo grueso tal que el rayo láser propaga paralelo a la superficie de la trampa-chip y casi toca la superficie del chip.
- Montar una lente de concentración para el láser 369,5 en una etapa de la traducción. Coloque la lente de concentración a lo largo de la dirección de propagación que el láser se centrará en las proximidades de la posición del reventado sobre la superficie del chip y para que el láser focalizado se propaga a lo largo de la superficie de la trampa-chip. Ajustar la posición de la lente de enfoque con la etapa de la traducción; la posición del foco de rayo láser seguirá el movimiento de la lente de enfoque.
- Lugar un lente de proyección de imagen de alta apertura numérica montado en una etapa de la traducción frente a la cámara UHV, teniendo en cuenta la distancia desde la superficie del chip ( figura 5).
- Alinee el rayo 369,5-nm con la superficie del chip de trampa por lo que hay cierta cantidad de dispersión de láser desde la superficie del chip.
Nota: La luz dispersada recopilada por la lente de la proyección de imagen formará una imagen débil en el plano de la imagen de la lente. Esta imagen puede observarse generalmente, incluso con papel fluorescente cuando el área es lo suficientemente oscuro. - Ajustar la posición de la lente de proyección de imagen hasta que la imagen en el papel fluorescente nítida.
- Lugar un electrón multiplicado junto cargada dispositivo (EMCCD) montado en una etapa de la traducción, teniendo en cuenta la ubicación de la imagen plano de la lente, encontró en el paso anterior.
- Montar un filtro de rayos infrarrojos (IR) delante de EMCCD para bloquear la radiación de cuerpo negro del horno cuando el horno se calienta para la evaporación.
- Montar un filtro bandpass de 369,5 nm frente EMCCD para bloquear la luz de fondo.
- Comparar la imagen de la EMCCD con el diseño de los electrodos. Ajustar las posiciones de la EMCCD y la lente de la imagen hasta que los electrodos pueden verse con el EMCCD. Alinear la lente de proyección de imagen y la EMCCD hasta que la imagen nítida.
- Identificar qué electrodos se muestran en el EMCCD y alinean el EMCCD para que coincida con su centro en la ubicación esperada captura.
- Alinear verticalmente el haz 369,5 nm por lo que pasará a través de la posición de captura. Para saber la distancia entre el centro de la viga y la superficie de la trampa, mover el rayo hacia la superficie de la trampa hasta que se maximiza la dispersión del haz de.
Nota: Después de paso 2.2.12, se puede suponer que el centro de la viga está situado en la superficie del chip. - De la simulación numérica de la trampa potencial 29, encontrar la altura prevista de la posición de captura de iones de la superficie del chip. Mover la viga nm 369.5 lejos de la superficie del chip la altura esperada mediante el micrómetro de la etapa de la traducción de la lente. Mover la lente de proyección de imagen y la EMCCD por la misma distancia. Anote las lecturas del micrómetro de la lente de proyección de imagen y la EMCCD.
- Alineación de los 399 nm y 935 nm los lasers y el test de horno
- Reemplazar los 369,5 nm bandpass filtro con filtro bandpass 399 nm. De la simulación numérica de la lente de proyección de imagen, encontrar la diferencia entre la distancia focal de luz 399-nm y la de la luz 369,5 nm resultante de la aberración cromática. Ajustar las posiciones longitudinales de la lente de proyección de imagen y EMCCD para hacer 399-nm se centró en el EMCCD.
- Colimar los rayos 399 y 935 nm, entregados de las fibras ópticas, con el respectivos colimadores y ajustar las alturas de los colimadores de fibra para que coincida con la altura del chip para hacer vigas de ambos propagan horizontalmente.
- Alinee el rayo nm 399 hacia la superficie de la trampa-chip a través de otro punto de visión que el 399 láser está propagando en la dirección opuesta de la 369.5 láser. Tratar de hacer el colimado 399 nm láser traslapo con el láser centrado 369.5.
- El haz colimado de nm 935 se combinan con la colimación 399 láser utilizando un espejo dicroico y alinee el rayo nm 935 que el 935 nm láser se propaga conjuntamente con el láser 399. Para comprobar qué tan bien los dos haces se solapan entre sí, desviar esas dos vigas con un espejo temporal antes de entrar en la cámara y medir las ubicaciones de las vigas por el camino de la viga usando un profiler de la viga o un pequeño agujero. Si el espacio es insuficiente para colocar el espejo temporal entre la cámara y la lente de enfoque, considera poner la configuración óptica en un protoboard pequeño óptico; el grado de solapamiento puede comprobarse en un lugar separado.
- Montar una lente de concentración para ambos láseres en una etapa de traducción adicionales y ajustar el enfoque objetivo entre el espejo dicroico y el espejo temporal. Calcular la distancia desde el espejo temporal a la posición del reventado y ajustar la ubicación de la lente de concentración tal que los 399 láser se centra en la posición de captura ( figura 6b).
- Comprobar si el foco de los 399 láser coincide con el enfoque de los 935 nm láser. Si no se solapan los dos focos, finalmente alinear el láser 935.
- Quitar el espejo temporal en la trayectoria del laser 399 nm. Comprobar el rastro de los 399 nm láser sobre la superficie del chip con EMCCD. Si no se observa ningún rastro de los 399 láser nm, mover el 399 nm paso de haz alrededor de la viruta. También, ajustar un poco la distancia entre la cámara y la lente de proyección de imagen hasta que la imagen de la superficie del chip nítida.
- Alinee el rastro de la viga 399 de nm sobre la superficie del chip, que pasará a la posición de captura esperados. Similar a la alineación de la viga 369.5 nm, mover la viga 399-nm hacia la superficie del chip hasta la intensidad de la luz dispersada se convierte maximizada.
- Mover el 399 láser nm de la superficie del chip de la misma altura en paso 2.2.13 usando un micrómetro. Volver al imagen objetivo y la EMCCD por la misma distancia.
- Poner el espejo temporal utilizado en paso 2.3.4. Repita el paso 2.3.6 y luego retire el espejo temporal.
Nota: Después de paso 2.3.10 el 935 nm láser puede suponerse que se pasa por la posición del reventado sobre la superficie del chip. - Fijar la longitud de onda de los 399 nm láser de cerca de 1 S 0-1 P 1 transición de 174 Yb (751.526 GHz). Encienda la corriente por el horno lleno de natural Yb y gradualmente aumente la corriente.
Nota: en general, evaporación no se inicia necesariamente en la misma corriente encontrada por el analizador de gas residual (RGA), como se describe en el Documento complementario, así que probar diferentes valores actuales hasta evaporación se observa. Sólo cuando los átomos neutros de Yb empiezan a evaporarse y la frecuencia del láser es resonante con el 1 S 0-1 P 1 de transición de uno de los isótopos de Yb, la Yb neutral átomos comenzará a absorber el láser de luz y volver a emitirla que la fluorescencia de la Yb puede observarse con el EMCCD. Generalmente, las frecuencias resonantes medidas por un metro de longitud de onda se desplazan de los valores nominales, que van desde decenas hasta cientos de MHz. Por lo tanto, para cada valor actual, análisis de la frecuencia de láser con un rango de span de 1 GHz y un paso de menos de 50 MHz se recomiendan. - Una vez que se observa la fluorescencia resonante del horno natural, reducir la corriente hasta que no se puede observar la fluorescencia.
- Exploración del laser alrededor de la primera frecuencia resonante y anote la cantidad de fluorescencia en cada resonancia. Comparar la distribución de la fuerza de la fluorescencia y el espaciado entre las resonancias con los valores de 37. Identificar las frecuencias de resonancia para los isótopos diferentes.
Nota: La resonancia de 174 Yb se ha medido para ser aproximadamente 751.52646(2) THz. Sin embargo, este valor se cambia de puesto levemente por el efecto Doppler, y el valor medido puede variar dependiendo de la exactitud del medidor de longitud de onda de.
- Atrapando iones.
- Reemplazar el filtro de paso de banda 399 nm con el filtro de paso de banda nm 369.5 y volver al imagen objetivo y la EMCCD a la posición obtenida en el paso 2.2.13 para que la fluorescencia de 369,5 nm emitida por iones atrapados puede ser reflejada en el EMCCD. Comprobar la alineación de todos los láseres una vez más repetir paso 2.2.12 y usando UV y IR viendo tarjetas para la inspección visual de la superposición de la viga.
- Compruebe que los voltajes de la DAC are bien puesto. Encienda el generador de RF en un ambiente de muy baja potencia y poco a poco aumentar la potencia de salida. Además, asegúrese de que la potencia reflejada desde el resonador helicoidal sigue siendo el mínimo por la exploración de la frecuencia de RF en la resonancia.
PRECAUCIÓN: Asegúrese de que la tensión amplificada en el chip de trampa no exceda el voltaje de avería. En la presión atmosférica, la rigidez dieléctrica de una película de SiO 2 se sabe que aproximadamente 10 7 V/cm, pero este valor no puede ser asumido en el entorno de UHV. Aunque el voltaje de la avería exacta en el entorno de UHV explícitamente no se mide, el espacio lateral de 8 μm de la trampa de la viruta en un 10 -11-Torr vacío soporta 240 V de amplitud de la tensión de RF en la configuración experimental. - Ajustar la frecuencia de lo 399 láser a la frecuencia de resonancia de 174 Yb, identificado en el paso 2.3.13. Ajustar la frecuencia del láser 935 nm para el isótopo de 174 Yb +.
Nota: Con un metro de longitud de onda, 320.57199(1) THz puede ser utilizado, pero debido a la limitada precisión de metros de longitud de onda, puede haber una variación de hasta decenas de MHz. - Ajustar la frecuencia del láser 369,5 nm en un valor que es ~ 100-200 MHz menos que la frecuencia de resonancia así que incluso si hay alguna cantidad de inexactitud con el medidor de longitud de onda, la frecuencia será todavía desintonizado de rojo.
Nota: Aquí, 200 MHz desintonización se resta de la resonancia esperada cuando la frecuencia resonante de la 174 Yb + es alrededor de 811.29152(1) THz. - Encender la fuente actual para el horno y el aumento de la corriente lentamente hasta que alcanza el valor encontrado en el paso 2.3.12. Espere unos minutos. Si no es atrapado ion, aumente la corriente de ~0.1-0.2 A y otra vez. Si el ion está todavía no atrapado, compruebe si el RF reflejado es aún mínimo y luego aumentar gradualmente la potencia de salida del generador de RF.
PRECAUCIÓN: Asegúrese de que la tensión amplificada en el chip de trampa no exceda la tensión de ruptura esperada. - Brevemente bloquean el láser 935 y compruebe si hay algún cambio en la imagen.
Nota: Si la configuración de EMCCD (incluyendo los multiplicadores de electrón (EM) ganancia, tiempo de exposición y contraste de la imagen) no está dentro de un rango adecuado, incluso cuando un ion está atrapado, no es fácil decir si el cambio de intensidad en las cercanías de la región de captura es causada por un ion atrapado real o por el cambio en la dispersión de la 369.5 láser. Por el filtro IR, la cámara EMCCD no muestra ningún cambio en el 935 nm láser, así bloqueando el 935 nm láser no hace ningún cambio a la imagen cuando no hay ningún ion atrapado. Sin embargo, si un ion es atrapado, la tasa de dispersión de los láser 369.5 cae significativamente sin el 935 nm láser. Por lo tanto, el cambio a la imagen EMCCD causada por bloqueo de los 935 nm láser es un buen indicador del éxito de iones reventado.
PRECAUCIÓN: Si se bloquea el 935 nm láser durante demasiado tiempo, el ion atrapado se calienta y podría escapar de la trampa. - Apagar el horno después de que los iones se encuentran atrapados. Tratar de encontrar la resonancia de la láser 369.5 aumentando gradualmente la frecuencia de.
Nota: Medida que la frecuencia se acerca a la resonancia, se incrementará la tasa de dispersión, pero una vez que se cruza la resonancia, el láser 369.5 comienza el ion de la calefacción en lugar de refrigeración, lo cual a su vez genera la imagen del ion atrapado a desestabilizarse. Una vez que se encuentra la frecuencia de resonancia de la 369.5 láser, reduce la frecuencia del láser por 10 MHz de la resonancia. - Analizar la frecuencia de los 935 nm láser hasta la tasa de dispersión de 369.5 nm obtiene maximizada.
- Ajustar la ubicación del imagen objetivo y la cámara EMCCD hasta que la imagen del ion afila.
Resultados
La figura 7 muestra el análisis micrográficos (SEM) del chip fabricado de trampa de iones. Los electrodos RF, interno DC electrodos, electrodos DC externos y ranura de carga fueron fabricados con éxito. El perfil de la pared lateral del Pilar dieléctrico se convirtió en irregular porque el óxido PECVD fue depositado en varios pasos. Los pasos múltiples de la deposición se utilizaron para minimizar los efectos de la tensión residual de películas de óxido gruesa. Esto se describe en la discusión.
La figura 8 muestra la imagen EMCCD de cinco 174Yb+ iones atrapados usando la viruta de trampa de iones recientemente. Los iones atrapados pueden durar más de 24 h con Doppler continuo enfriamiento. El número de iones atrapados puede ajustarse entre 1 y 20 por cambiar la configuración de voltaje de DC aplicada. Este montaje experimental es muy fiable y robusto y en la actualidad ha estado en operación durante 50 meses.
La figura 9 muestra el transporte de iones atrapados a lo largo de la dirección axial. La posición de ion en la Figura 9b es desplazada desde en la Figura 9a con el ajuste de la posición de mínimo potencial DC cambiando el voltaje de CC.
La figura 10 muestra los resultados preliminares de experimentos de oscilación de Rabi con un ión de Yb+ 171. Para obtener los resultados, se usaron las configuraciones adicionales descritas en el Documento complementario . Los resultados se incluyeron para mostrar una posible aplicación de la disposición experimental explicada en este artículo.
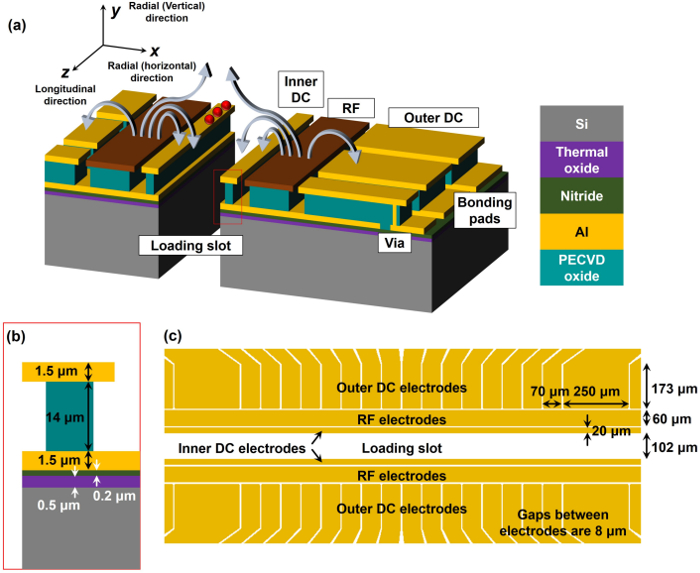
Figura 1: esquema de la trampa de iones superficial. (a) el rojo puntos representa los iones atrapados. Los electrodos de marrón y amarillo indican los electrodos de RF y DC, respectivamente. Las flechas grises indican la dirección del campo eléctrico durante la fase positiva de la tensión de RF. Tenga en cuenta que el esquema no está dibujado a escala. Dimensiones (b) la vertical de la estructura del electrodo. Dimensiones (c) el lateral de la estructura del electrodo. Haga clic aquí para ver una versión más grande de esta figura.
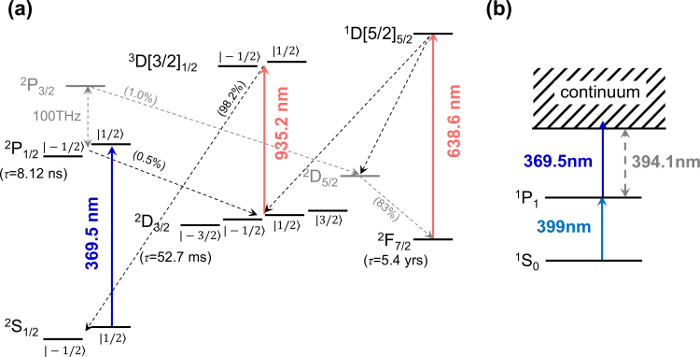
Figura 2: Simplificar diagramas de nivel de energía de un ion de Yb+ 174y un átomo neutro 174del Yb. (a) cuando un 369.5 nm láser se desintoniza al lado rojo (menor frecuencia) de la resonancia, una transición ciclismo entre 2P1/2 y 2S1/2 reduce la energía cinética de los iones por el Doppler efecto. Ocasionalmente, un cociente de ramificación pequeño pero finito hace el decaimiento del electrón 2P1/2 a 2D3/2, y un láser 935 deba regresar el electrón a la transición de ciclismo principal. El electrón también puede decaer en un estado de7/2 2F una vez por hora, en promedio y un 638 nm láser de la bomba fuera del estado de7/2 2F, pero esto no es necesario para un sistema simple de38. Los valores en la notación de ket representan las proyecciones de los ímpetus angulares total J a lo largo de la cuantización eje mJ. (b) para ionizar átomos neutrales se evaporó del horno, un proceso de absorción de dos fotones fue usado39. Un 399 láser había excitado un electrón al estado de1 1P, y el fotón nm 369.5 para enfriamiento Doppler tenía más energía que la necesaria para quitar el electrón excitado del ion. Haga clic aquí para ver una versión más grande de esta figura.
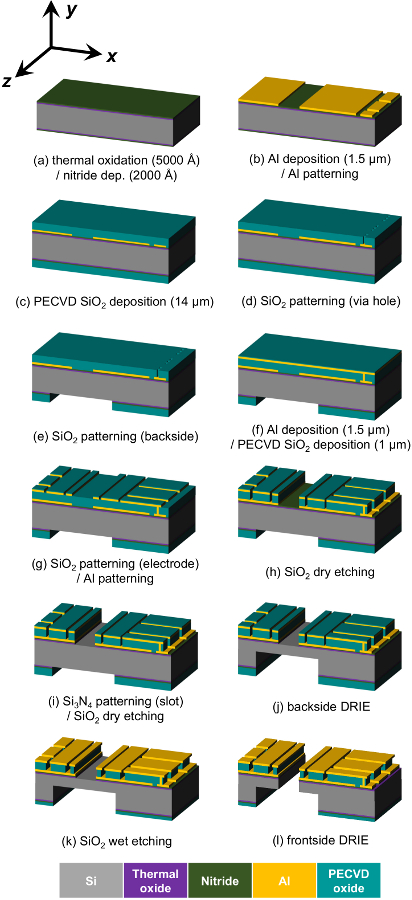
Figura 3: flujo de proceso de fabricación de una trampa de iones superficial. (un) termal oxidación a crecer un 5.000 Å de espesor de SiO2 capa y LPCVD de una capa de 2.000 Å de espesor Si3N4 . (b) aguafuerte de la deposición y el ICP de una capa de Al pulverización 1,5 μm de espesor. (c) la deposición de una 14 μm de espesor SiO2 la capa en los ambos lados de la oblea mediante procesos PECVD. (d) patrones de la 14 μm de espesor de SiO2 capa depositada en la parte frontal de la oblea mediante un proceso RIE (e) patrón de la capa de2 14 μm de espesor SiO depositado en la parte trasera de la oblea mediante un proceso RIE. (f) la deposición de un 1.5 μm espesor escupió Al capa y otra 1 μm de espesor PECVD SiO2 . (g) proceso de modelar de la 1,5 μm de espesor mediante un proceso ICP y 1 μm de espesor SiO2 utilizando un RIE. (h) patrones de la capa de2 14 μm de espesor SiO depositan en la parte frontal de la oblea mediante un proceso RIE. () proceso de modelar de la 5.000 Å de espesor de SiO2 y 2.000 Å de espesor Si3N4 utilizando un RIE. (j) DRIE del sustrato de silicio 450 μm de la parte trasera de la oblea. (k) grabado mojado de la capa de SiO2 en los electrodos de Al y las paredes laterales de los pilares del dieléctricos. (l) penetración del sustrato de silicio de la parte delantera a través de un proceso DRIE. Tenga en cuenta que los esquemas no se dibujan a escala. Haga clic aquí para ver una versión más grande de esta figura.
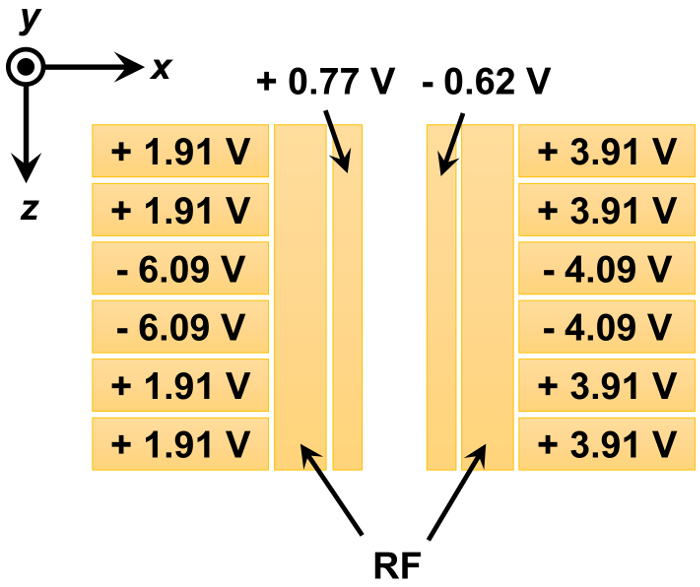
Figura 4: ejemplo de la tensión DC set usado para atrapar los iones a. Pueden compensar las tensiones aplicadas a los rieles interiores para el campo eléctrico asimétrico en sentido horizontal a la inclinación de los ejes principales del potencial total en el plano transversal. La frecuencia de la trampa axial generada por el sistema de tensión fue 550 kHz. Haga clic aquí para ver una versión más grande de esta figura.
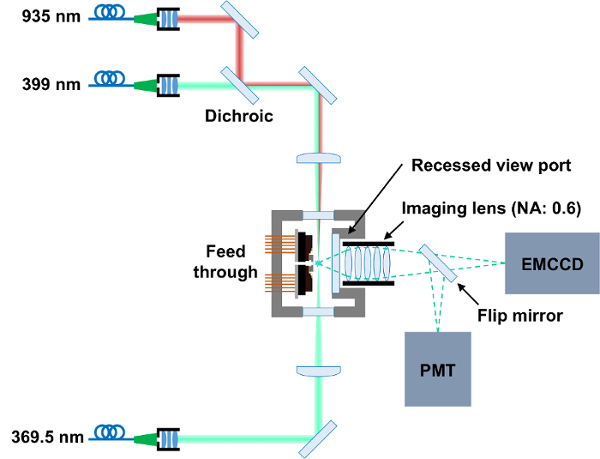
Figura 5: esquema de la configuración óptica. Tres láseres de diodo están alineados para superponer en la posición de captura. Visión ahuecado de la cámara UHV permite la proyección de imagen lente para colocarse lo más cerca posible de la viruta de la superficie. Un flip-espejo colocado entre la lente de proyección de imagen y la EMCCD permite el monitoreo selectivo de la fluorescencia de iones mediante un tubo del fotón multiplicado (PMT) o un EMCCD. Haga clic aquí para ver una versión más grande de esta figura.

Figura 6: imágenes de la configuración óptica construida. (a) A la bobina se enrolla alrededor de la vista frontal de la cámara para generar un campo magnético, que puede romper los niveles de energía degenerados de iones de iterbio. (b) la configuración óptica para el manejo de los 399 nm y 935 nm vigas. Las líneas rojas y verdes indican la trayectoria de la viga de los 935 nm y 399 nm, láser respectivamente. (c) la configuración de la proyección de imagen de sistema, incluyendo flip-mirror, la lente de proyección de imagen, el EMCCD y el dto. El camino de la fluorescencia emitida por los iones atrapados puede determinarse por el espejo de flip. Las flechas verdes y blancas, indicar el camino de la fluorescencia monitoreados por el EMCCD y lo PMT, respectivamente. Haga clic aquí para ver una versión más grande de esta figura.
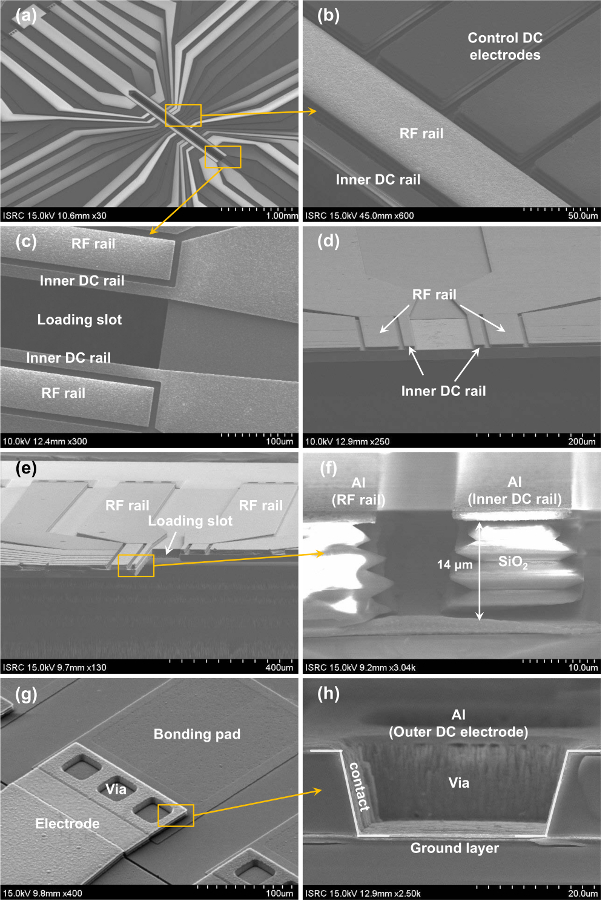
Figura 7: resultados de la fabricación de la trampa de iones superficial. (a) Resumen de la disposición de la viruta. (b) una vista magnificada de la disposición de la viruta, que muestra los múltiples electrodos de DC externos. (c) una vista ampliada del diseño de viruta, que muestra la ranura de carga. vista (d) una sección transversal de la región de captura antes de penetrar en la ranura de carga. vista (e) una sección transversal de la región de captura después de penetrar la ranura de carga. (f) A magnifica vista transversal de la columna de óxido. Los pilares de óxido han dentadas paredes, y la longitud de la proyección no es suficiente, que se atribuye a la tasa de etch no uniforme de SiO2 en las interfaces entre el depositado por separado 3,5 μm de espesor SiO2 . (g) A la vista superior de un cojín de alambre de la vinculación de un electrodo de CC. (h) A vista transversal de una vía. Perfiles inclinados la pilares de óxido permiten la conexión del electrodo de la DC y la capa de tierra durante la deposición de la capa de en la pared lateral del Pilar óxido en vez de llenar la vía los agujeros con un proceso de galvanoplastia. Haga clic aquí para ver una versión más grande de esta figura.
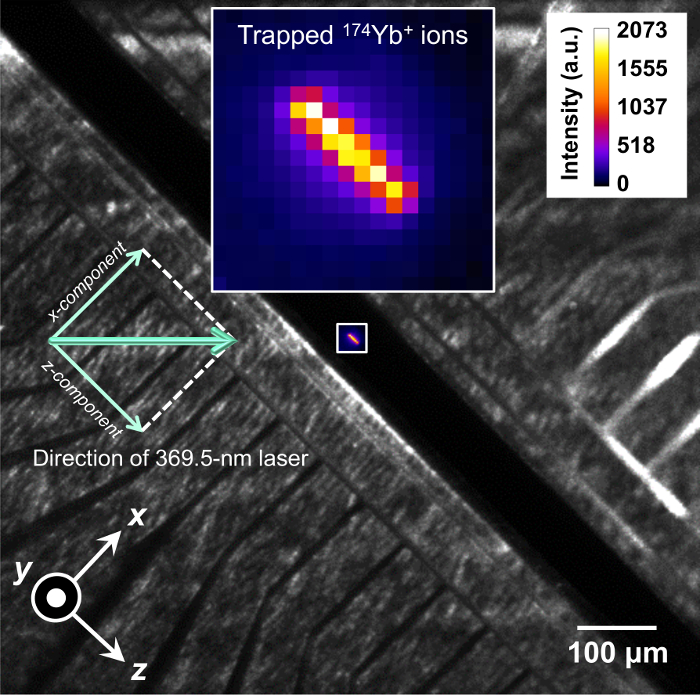
Figura 8: imagen de un EMCCD de cinco iones de Yb+ 174atrapados en el chip de trampa de iones microfabricated. La imagen de la estructura de electrodo de superficie de la trampa fue tomada por separado, y las imágenes de los iones atrapados y de los electrodos se combinaron para mayor claridad. La leyenda de intensidad sólo se aplica a los píxeles en el cuadro. La flecha gruesa muestra la trayectoria de la viga de la 369.5 láser y las flechas finas representan los componentes x y z del ímpetu del fotón. Haga clic aquí para ver una versión más grande de esta figura.

Figura 9: ajuste del potencial de los iones atrapados en una cadena lineal axial. (a) siete iones en el centro de la trampa. (b) los iones eran transportes decenas de micrómetros. (c) la cadena ion exprimido en la dirección axial. Esta figura es mejor vista como una película, que es cargada por separado. Haga clic aquí para ver una versión más grande de esta figura.

Figura 10: Resultados experimentales de oscilaciones de Rabi entre el | 0  y | 1
y | 1  Estados. | 0
Estados. | 0 se define como las 2S1/2| F = 0, mF= 0
se define como las 2S1/2| F = 0, mF= 0 estado del ion 171Yb+ , y | 1
estado del ion 171Yb+ , y | 1 se define como las 2S1/2| F = 1, mF= 0
se define como las 2S1/2| F = 1, mF= 0 estado. La oscilación de Rabi es inducida por microondas de 12,6428 GHz. Esferas de Bloch sobre la trama de mostrar los estados cuánticos correspondientes en diferentes momentos. Haga clic aquí para ver una versión más grande de esta figura.
estado. La oscilación de Rabi es inducida por microondas de 12,6428 GHz. Esferas de Bloch sobre la trama de mostrar los estados cuánticos correspondientes en diferentes momentos. Haga clic aquí para ver una versión más grande de esta figura.
Documento complementario: Haga clic aquí para descargar este documento.
Discusión
Este trabajo presenta un método para iones de captura con trampas de iones superficiales recientemente. La construcción de un sistema de captura de iones requiere experiencias en diversos campos de la investigación pero no se ha descrito previamente en detalle. Este documento proporciona procedimientos detallados para microfabricating un chip de la trampa, así como para construir una instalación experimental para atrapar iones por primera vez. Este artículo también proporciona procedimientos detallados para atrapar iones de Yb+ 174y experimentación con los iones atrapados.
Un obstáculo importante que enfrentan en los procesos de microfabricación es la deposición de la capa dieléctrica, con un espesor de más de 10 μm. Durante el proceso de deposición de la capa dieléctrica, tensión residual puede acumular, que puedan causar daños a la película dieléctrica o incluso romper la oblea. Para reducir el estrés residual, que es generalmente a la compresión, una tasa de deposición lenta debe ser usado40. En nuestro caso, un esfuerzo de compresión de 110.4 MPa se midió con las condiciones de deposición de sccm 540 SiH4 gas, 140 W de potencia, y 1,9 Torr de presión 5-μm grosor de película. Sin embargo, estas condiciones de proceso proporcionan sólo una referencia aproximada, puesto que estas condiciones pueden variar considerablemente para diferentes equipos. Con el fin de reducir los efectos del stress acumulado, películas de2 de SiO de 3,5 μm de grosor fueron depositadas fabricarán en ambos lados de la oblea en el método presentado. El espesor requerido de la capa dieléctrica puede reducirse si una menor amplitud de la tensión de RF y por lo tanto una menor profundidad de la trampa es elegida. Sin embargo, una menor profundidad de trampa fácilmente conduce a la fuga de iones atrapados, para que la fabricación de capas dieléctricas más gruesas, que pueden soportar voltajes más altos de RF, es más deseable.
Existen algunas limitaciones para el método de fabricación presentados en este documento. Las longitudes de las proyecciones no son suficientes para ocultar totalmente las paredes laterales dieléctricas de los iones atrapados, como se muestra en la figura 7f. Además, las paredes laterales de los pilares de óxido son irregulares, aumentando el área expuesta de las estructuras dieléctricas en comparación con el pilar de óxido vertical. Por ejemplo, en el caso de la pared lateral del riel interior C.C. cerca de la ranura de carga con una proyección uniforme de 5 μm, se calcula que el 33% de la superficie del dieléctrico está expuesto a la posición de iones atrapados de la pared vertical. En el caso de borde irregular, está expuesto más del 70% de la superficie de la pared lateral. Estos resultados de fabricación no ideales pueden inducir campos callejeros adicionales de los dieléctricos expuestos, pero los efectos no se han medido cuantitativamente. Sin embargo, el chip fabricado como se informó anteriormente se ha utilizado con éxito en la interceptación del ion y experimentos de manipulación del qubit. Además, el chip de la trampa presentado en este trabajo ha expuesto flancos de silicio cerca de la ranura de carga. Óxido nativo puede crecer en las superficies de silicio y puede resultar en más campos dispersos. Por lo tanto, se recomienda proteger el sustrato de silicio con una capa adicional de metal, como en33.
Para atrapar los iones de Yb+ 174, las frecuencias de los rayos láser deben ser estabilizadas dentro de unas decenas de MHz, y se discuten algunos métodos diferentes en configuraciones avanzadas38,41. Sin embargo, para la configuración simple en este papel, captura inicial es posible sólo con la estabilización con un medidor de longitud de onda.
Este documento proporciona un protocolo para atrapar iones de Yb+ 174usando un chip de trampa de iones superficiales recientemente. Aunque no se discute específicamente el protocolo para atrapar iones de Yb+ 171, el montaje experimental descrito en este artículo también puede utilizarse para atrapar iones de 171Yb+ y manipular el estado del qubit de 171 Iones Yb+ para obtener Rabi oscilación resultados (se muestra en la figura 10). Esto puede hacerse mediante la adición de varios moduladores ópticos a la salida de los rayos láser y usando una configuración de microondas, como se describe en el Documento complementario.
En conclusión, los métodos experimentales y los resultados presentados en este documento pueden utilizarse para desarrollar varias aplicaciones de información cuántica con superficie trampas de iones.
Divulgaciones
Los autores no tienen nada que revelar.
Agradecimientos
Esta investigación fue parcialmente financiada por el Ministerio de ciencia, TIC, y planificación del futuro (MSIP), Corea del sur, bajo el centro de investigación tecnología de información (ITRC) apoyo programa (IITP-2017-2015-0-00385) y la R ICT & programa D (10043464, desarrollo de repetidor la tecnología cuántica para la aplicación de sistemas de comunicación), supervisado por el Instituto para la información & promoción de tecnología de comunicaciones (IITP).
Materiales
| Name | Company | Catalog Number | Comments |
| photoresist used for 2-μm spin coating | AZ Materials | AZ7220 | Discontinued. Easily replaced by other alternative photoresist product. |
| photoresist used for 6-μm spin coating | AZ Materials | AZ4620 | Discontinued. Easily replaced by other alternative photoresist product. |
| ceramic chip carrier | NTK | IPKX0F1-8180BA | |
| epoxy compound | Epotek | 353ND | |
| Plasma enhanced chemical vapor deposition (PECVD) system | Oxford Instruments | PlasmaPro System100 | |
| Low pressure chemical vapor deposition (LPCVD) system | Centrotherm | E-1200 | |
| Furnace | Seltron | SHF-150 | |
| Sputter | Muhan Vacuum | MHS-1500 | |
| Manual aligner | Karl-Suss | MA-6 | |
| Deep Si etcher | Plasma-Therm | SLR-770-10R-B | |
| Inductive coupled plasma (ICP) etcher | Oxford Instruments | PlasmaPro System100 Cobra | |
| Reactive ion etching (RIE) etcher | Applied Materials | P-5000 | |
| Boundary element method (BEM) software | CPO Ltd. | Charged Particle Optics | |
| Single crystaline (100) silicon wafer | STC | 4SWP02 | 100 mm / (100) / P-type / SSP / 525±25 μm |
| metal tubes | Mcmaster-carr | 89935K69 | 316 Stainless Steel Tubing, 0.042" OD, 0.004" Wall Thickness |
| Yb piece | Goodfellow | YB005110 | Ytterbium wire, purity 99.9% |
| enriched 171Yb | Oak Ridge National Laboratory | Yb-171 | https://www.isotopes.gov/catalog/product.php?element=Ytterbium |
| tantalum foil | The Nilaco Corporation | TI-453401 | 0.25x130x100mm 99.5% |
| Kapton-insulated copper wire | Accu-glass | 18AWG (silver plated copper wire kapton insulted) | |
| residual gas analyzer (RGA) | SRS | RGA200 | |
| turbo pump | Agilent | Twistorr84 FS | |
| all-metal valve | KJL | manual SS All-Metal Angle Valves (CF flanged) | |
| Leak detector (used as a rough pump) | Varian | PD03 | |
| ion gauges | Agilent | UHV-24p | |
| ion pump | Agilent | VacIon Plus 20 | |
| NEG pump | SAES Getters | CapaciTorr D400 | |
| spherical octagon | Kimball Physics | MCF600-SphOct-F2C8 | |
| ZIF socket | Tactic Electronics | P/N 100-4680-002A | |
| multi-pin feedthroughs | Accu-Glass | 6-100531 | |
| 25 D-sub gender adapters | Accu-Glass | 104101 | |
| Recessed viewport | Culham Centre for Fusion Energy | 100CF 316LN+20.9 Re-Entrant 316 (Custom order) | Disc material: 60cv Fused Silica 4mm THK, TWE Lambda 1/10, 20/10 Scratch-Dig |
| Recessed viewport AR coating | LaserOptik | AR355nm/0-6° HT370-650nm/0-36° on UHV (Custom order) | AR coating was performed in the middle of the fabrication of the recessed viewport |
| Digital-analog converter | AdLink | PCIe-6216V-GL | |
| 369.5nm laser | Toptica | TA-SHG Pro | |
| 369.5nm laser | Moglabs | ECD004 + 370LD10 + DLC102/HC | |
| 399nm laser | Toptica | DL 100 | |
| 935nm laser | Toptica | DL 100 | |
| 369.5nm & 399nm optical fiber | Coherent | NUV-320-K1 | Patch cables are connectorized by Costal Connections. |
| 935nm optical fiber | GouldFiber Optics | PSK-000626 | 50/50 fiber beam splitter made of Corning HI-780 single mode fiber to combine 935nm and 638nm together. |
| Wavelength meter | High Finesse | WSU-2 | |
| temporary mirror | Thorlabs | PF10-03-P01 | |
| Dichroic mirror | Semrock | FF647-SDi01-25x36 | |
| 369.5nm & 399nm collimator | Micro Laser Systems | FC5-UV-T/A | |
| 935nm collimator | Schäfter + Kirchhoff | 60FC-0-M8-10 | |
| 369.5nm focusing lens | CVI | PLCX-25.4-77.3-UV-355-399 | Focal length: ~163mm @ 369.5nm |
| 399nm & 935nm focusing lens | CVI | PLCX-25.4-64.4-UV-355-399 | Focal length: ~137mm @ 399nm, ~143mm @ 935nm |
| imaging lens | Photon Gear | P/N 15470 | |
| 369.5nm bandpass filter | Semrock | FF01-370/6-25 | |
| 399nm bandpass filter | Semrock | FF01-395/11-25 | |
| IR filter | Semrock | FF01-650/SP-25 | |
| EMCCD camera | Andor Technology | DU-897U-CS0-EXF | |
| PMT | Hamamatsu | H10682-210 |
Referencias
- Wineland, D. J. Nobel Lecture: Superposition, entanglement, and raising Schrödinger's cat. Rev Mod Phys. 85 (3), 1103 (2013).
- Blatt, R., Wineland, D. Entangled states of trapped atomic ions. Nature. 453 (7198), 1008-1015 (2008).
- Leibfried, D., Blatt, R., Monroe, C., Wineland, D. Quantum dynamics of single trapped ions. Rev Mod Phys. 75 (1), 281 (2003).
- Paul, W. Electromagnetic traps for charged and neutral particles. Rev Mod Phys. 62 (3), 531 (1990).
- Rosenband, T., et al. Frequency ratio of Al+ and Hg+ single-ion optical clocks; metrology at the 17th decimal place. Science. 319 (5871), 1808-1812 (2008).
- Dawson, P. H. . Quadrupole mass spectrometry and its applications. , (2013).
- Ladd, T. D., Jelezko, F., Laflamme, R., Nakamura, Y., Monroe, C., O'Brien, J. L. Quantum computers. Nature. 464 (7285), 45-53 (2010).
- Monz, T., et al. Realization of a scalable Shor algorithm. Science. 351 (6277), 1068-1070 (2016).
- Debnath, S., Linke, N. M., Figgatt, C., Landsman, K. A., Wright, K., Monroe, C. Demonstration of a small programmable quantum computer with atomic qubits. Nature. 536 (7614), 63-66 (2016).
- Blatt, R., Roos, C. F. Quantum simulations with trapped ions. Nature Phys. 8 (4), 277-284 (2012).
- Kielpinski, D., Monroe, C., Wineland, D. J. Architecture for a large-scale ion-trap quantum computer. Nature. 417 (6890), 709-711 (2002).
- Moehring, D. L., et al. Design, fabrication and experimental demonstration of junction surface ion traps. New J Phys. 13 (7), 075018 (2011).
- Wright, K., et al. Reliable transport through a microfabricated X-junction surface-electrode ion trap. New J Phys. 15 (3), 033004 (2013).
- Amini, J. M., et al. Toward scalable ion traps for quantum information processing. New J Phys. 12 (3), 033031 (2010).
- Sterling, R. C., et al. Fabrication and operation of a two-dimensional ion-trap lattice on a high-voltage microchip. Nat Commun. 5, (2014).
- Kumph, M., et al. Operation of a planar-electrode ion-trap array with adjustable RF electrodes. New J Phys. 18 (2), 023047 (2016).
- Mielenz, M., et al. Arrays of individually controlled ions suitable for two-dimensional quantum simulations. Nat Commun. 7, (2016).
- Stick, D., Hensinger, W. K., Olmschenk, S., Madsen, M. J., Schwab, K., Monroe, C. Ion trap in a semiconductor chip. Nat Phys. 2 (1), 36-39 (2006).
- Harty, T. P., et al. High-fidelity preparation, gates, memory, and readout of a trapped-ion quantum bit. Phys Rev Lett. 113 (22), 220501 (2014).
- Cho, D., Hong, S., Lee, M., Kim, T. A review of silicon microfabricated ion traps for quantum information processing. Micro Nano Sys Lett. 3 (1), 1-12 (2015).
- Weidt, S., et al. Trapped-ion quantum logic with global radiation fields. Phys Rev Lett. 117 (22), 220501 (2016).
- Monroe, C., Kim, J. Scaling the ion trap quantum processor. Science. 339 (6124), 1164-1169 (2013).
- Brown, K. R., Kim, J., Monroe, C. Co-designing a scalable quantum computer with trapped atomic ions. npj Quantum Inf. 2, 16034 (2016).
- Lekitsch, B., et al. Blueprint for a microwave trapped-ion quantum computer. Science Adv. 3 (2), e1601540 (2017).
- Reichel, J., Vuletic, V. . Atom chips. , (2011).
- Ghosh, P. K., ed, ,. 1. s. t. . Ion Traps. , (1995).
- Wesenberg, J. H. Electrostatics of surface-electrode ion traps. Phys Rev A. 78 (6), 063410 (2008).
- House, M. G. Analytic model for electrostatic fields in surface-electrode ion traps. Phys Rev A. 78 (3), 033402 (2008).
- Hong, S., Lee, M., Cheon, H., Kim, T., Cho, D. I. Guidelines for Designing Surface Ion Traps Using the Boundary Element Method. Sensors. 16 (5), 616 (2016).
- Allcock, D. T. C., et al. Implementation of a symmetric surface-electrode ion trap with field compensation using a modulated Raman effect. New J Phys. 12 (5), 053026 (2010).
- Chiaverini, J., et al. Surface-electrode architecture for ion-trap quantum information processing. Quantum Inf Comput. 5 (6), 419-439 (2005).
- Allcock, D. T. C., et al. Heating rate and electrode charging measurements in a scalable, microfabricated, surface-electrode ion trap. Appl Phys B. 107 (4), 913-919 (2012).
- . Demonstration of a microfabricated surface electrode ion trap Available from: https://arxiv.org/abs/1008.0990 (2010)
- Allcock, D. T. C., et al. Reduction of heating rate in a microfabricated ion trap by pulsed-laser cleaning. New J Phys. 13 (12), 123023 (2011).
- Mount, E., et al. Single qubit manipulation in a microfabricated surface electrode ion trap. New J Phys. 15 (9), 093018 (2013).
- Siverns, J. D., Simkins, L. R., Weidt, S., Hensinger, W. K. On the application of radio frequency voltages to ion traps via helical resonators. Appl Phys B. 107 (4), 921-934 (2012).
- Kleinert, M., Dahl, M. E. G., Bergeson, S. Measurement of the Yb I 1S0−1P1 transition frequency at 399 nm using an optical frequency comb. Phys Rev A. 94 (5), 052511 (2016).
- Olmschenk, S., Younge, K. C., Moehring, D. L., Matsukevich, D. N., Maunz, P., Monroe, C. Manipulation and detection of a trapped Yb+ hyperfine qubit. Phys Rev A. 76 (5), 052314 (2007).
- Sansonetti, J. E., Martin, W. C., Young, S. L. . Handbook of Basic Atomic Spectroscopic Data. , (2013).
- Kern, W. . Thin film processes II. , (2012).
- Streed, E. W., Weinhold, T. J., Kielpinski, D. Frequency stabilization of an ultraviolet laser to ions in a discharge. Appl Phys Lett. 93 (7), 071103 (2008).
Reimpresiones y Permisos
Solicitar permiso para reutilizar el texto o las figuras de este JoVE artículos
Solicitar permisoThis article has been published
Video Coming Soon
ACERCA DE JoVE
Copyright © 2025 MyJoVE Corporation. Todos los derechos reservados