Method Article
Os métodos experimentais de armadilhagem sem crueldade íons usando Microfabricated íon armadilhas de superfície
Neste Artigo
Resumo
Este trabalho apresenta uma metodologia de microfabrication para superfície armadilhas de íons, bem como um procedimento experimental detalhado para íons de itérbio armadilhas em um ambiente de temperatura.
Resumo
Preso em um armadilha de Paul de quadrupolo de íons têm sido considerados um dos fortes candidatos físicos para implementar o processamento da informação quântica. Isto é devido ao seu tempo de coerência de tempo e sua capacidade de manipular e detectar pedaços individuais quântica (qubits). Em anos mais recentes, microfabricated superfície ion armadilhas ter recebido mais atenção para plataformas qubit integrado em larga escala. Este trabalho apresenta uma metodologia de microfabrication íon armadilhas usando tecnologia de sistemas microeletro-mecânico (MEMS), incluindo o método de fabricação para um 14 µm de espessura camada dielétrica e metal pendem sobre estruturas no topo da camada dielétrica. Além disso, um procedimento experimental para aprisionando os íons de itérbio (Yb) isótopo 174 (174Yb+) usando 369.5 nm, 399 nm, e 935 lasers de diodo nm é descrito. Estes procedimentos e metodologias envolvem muitas disciplinas científicas e de engenharia, e este papel primeiro apresenta os procedimentos detalhados de experimentais. Os métodos abordados neste artigo podem ser facilmente estendidos para a captura de íons Yb de isótopo 171 (171Yb+) e a manipulação dos qubits.
Introdução
Uma armadilha de Paul pode confinar partículas carregadas, incluindo íons no espaço vazio, usando uma combinação de um campo elétrico estático e um campo elétrico variável, oscilando a radiofrequência (RF), e os estados quânticos dos íons confinados na armadilha pode ser medidos e controlada1,2,3. Tais armadilhas de íons foram originalmente desenvolvidas para aplicações de medição precisa, incluindo relógios ópticos e espectroscopia de massa4,5,6. Nos últimos anos, estas armadilhas de íons têm também sido ativamente exploradas como uma plataforma física para implementar o processamento de informação quântica atribuído às características desejáveis de íons presos, como longos períodos de coerência, isolamento ideal em uma altíssima ambiente de vácuo (UHV) e a viabilidade de manipulação qubit individual7,8,9,de10. Desde Kielpinski et al. 11 , proposta uma arquitetura escalável íon-armadilha que pode ser usada para desenvolver computadores quânticos, vários tipos de armadilhas de superfície, incluindo a junção armadilhas12,13, armadilha multi-zona fichas14e matriz 2D armadilhas15,16,17, foram desenvolvidos utilizando semicondutores derivado de processo microfabrication métodos18,19,20,21 . Em grande escala quântica processamento de informações sistemas baseados na superfície de armadilhas também têm sido discutiram22,23,24.
Este documento apresenta os métodos experimentais de íons de captura com armadilhas de íon microfabricated superfície. Mais especificamente, um processo para a fabricação de superfície ion armadilhas e um procedimento detalhado para íons de captura usando as armadilhas fabricadas são descritos. Além disso, descrições detalhadas de várias técnicas práticas para configurar o sistema experimental e aprisionando os íons são fornecidas no Documento complementar.
A metodologia para microfabricating uma superfície armadilha do íon é dada na etapa 1. A Figura 1 mostra um esquema simplificado de uma armadilha de íon a superfície. Os campos elétricos gerados pela tensão aplicada aos eletrodos no plano transversal também são mostrados25. Uma tensão de RF é aplicada para o par de eletrodos de RF, enquanto todos os outros eletrodos são mantidos no chão de RF; o potencial de ponderomotive26 gerado pela tensão de RF restringe os íons para a direção radial. A tensão de corrente contínua (DC) aplicada aos vários eletrodos DC fora os eléctrodos de RF confinar os íons para a direção longitudinal. Os trilhos internos entre os eletrodos de RF são projetados para ajudar a inclinar os eixos principais do potencial total no plano transversal. A metodologia para a concepção de um conjunto de tensão DC é incluída no Documento complementar. Além disso, mais detalhes para projetar os parâmetros geométricos essenciais de chips de superfície íon-armadilha podem ser encontrados em27,28,29,30,31.
O método de fabricação introduzido na etapa 1 foi concebido tendo em conta os seguintes aspectos. Primeiro, a camada dielétrica entre a eletrodo camada e a camada de solo deve ser suficientemente espessa para evitar a avaria elétrica entre as camadas. Geralmente, a espessura deve ser mais de 10. Durante a deposição da grossa camada dielétrica, a tensão residual dos filmes depositados pode causar curvatura do substrato ou danos aos filmes depositados. Assim, controlando a tensão residual é uma das principais técnicas na fabricação das armadilhas superfície ion. Em segundo lugar, a exposição das superfícies dielétricas para a posição de íon deve ser minimizada porque acusações perdidas podem ser induzidas no material dielétrico por lasers dispersa radiação ultravioleta (UV), que, em vez resulta em uma mudança aleatória de íon, posicionar. A área exposta pode ser reduzida através da concepção de estruturas de eletrodo de saliência. Tem sido relatado que íon armadilhas com eletrodo saliências são resistentes a carga sob condições experimentais típico32de superfície. Terceiro, todos os materiais, incluindo vários filmes depositados, devem ser capazes de resistir a 200 ° C, assar por aproximadamente 2 semanas, e a quantidade de gases de todos os materiais deve ser compatíveI com ambientes UHV. O projeto de microfabricated de fichas a superfície íon-armadilha neste trabalho é baseado no projeto armadilha de33, que foi utilizado com sucesso em vários experimentos32,33,34, 35. nota que este projeto inclui um slot no meio o chip para átomos neutros, que são posteriormente a carregar foto-ionizada para interceptação.
Após a fabricação do chip íon-armadilha, o chip é montado e eletricamente conectado à portadora microplaqueta usando fios de ligação do ouro. O portador do chip for instalado em uma câmara UHV. Um procedimento detalhado para a preparação de um pacote de microplaqueta de armadilha e o projeto da câmara UHV são fornecidos no Documento complementar.
Preparação do equipamento ótico e elétrico, bem como os procedimentos experimentais para íons de armadilhagem, são explicados em detalhes na etapa 2. Os íons presos pelo ponderomotive potencial são geralmente sujeitos a flutuação do campo elétrico ao redor, que continuamente aumenta a energia cinética dos íons. Laser de resfriamento baseado no efeito Doppler pode ser usado para remover o excesso de energia de movimento dos íons. A Figura 2 mostra o diagrama simplificado do nível de energia de um íon de Yb+ 174e um átomo de Yb neutro 174. Arrefecimento Doppler de íons de Yb+ 174requer um laser 369,5-nm e um laser de 935-nm, enquanto foto-ionização de átomos de Yb neutro 174requer um laser 399-nm. Etapas, 2.2 e 2.3 descrevem um método eficiente para alinhar estes lasers para o chip de superfície íon-armadilha e um procedimento para encontrar as condições apropriadas para foto-ionização. Depois que os componentes ópticos e elétricos são preparados, aprisionando os íons é relativamente simples. A sequência experimental para íons de interceptação é apresentada na etapa 2.4.
Protocolo
1. fabricação do íon-armadilha Chip pacote
- Microfabrication do chip superfície íon-armadilha.
Nota: As condições de processo descritas nesta seção fornecem apenas uma referência áspera, desde que os parâmetros ideais para cada processo podem variar significativamente para equipamentos diferentes. As condições de temperatura são dadas apenas para os processos de alta temperatura, tais como a oxidação e deposição de vapor químico. O processo de fabricação é realizado usando wafers de silício 100 mm de diâmetro.- Preparar um único silício cristalino da bolacha com uma espessura de 525-500 µm e limpá-lo usando solução piranha durante 15 min.
- Termicamente oxidar o wafer de silício em um tubo de forno para formar 0,5 µm de espessura SiO 2 camadas de dielétricos em ambos os lados.
Nota: Estas camadas eletricamente podem isolar o substrato de silício da camada de solo. Os parâmetros de processo utilizados no molhado-oxidação foram: O 2 caudal de 6.500 sccm, N 2 caudal de 5.000 sccm, taxa de fluxo de 2 H de 7.000 sccm, processar a temperatura de 900 ° C e processar tempo de 4.5 h (ver a tabela de de Materiais para detalhes do equipamento). - Depósito de 0,2 µm de espessura Si 3 N 4 camadas de ambos os lados do wafer usando um processo de depósito (LPCVD) de baixa pressão de vapor químico ( Figura 3a) para proteger as camadas de óxido térmica durante a processo molhado-gravura mostrado na Figura 3 k.
Nota: Os parâmetros de processo, utilizados no processo de LPCVD são: taxa de fluxo de 2 SiCl 2 H de 30 sccm, NH 3 vazão de 100 sccm, pressão de 200 mTorr e temperatura de processo de 785 ° C. Isso resulta em uma taxa de deposição de 40 Å / min (ver a Tabela de materiais para detalhes do equipamento). - Depositar uma camada de Al/Cu (1%) 1,5 µm de espessura sobre a bolacha usando um processo de pulverização catódica e os seguintes parâmetros: vazão de Ar de 40 sccm, pressão de 2 mTorr e potência de RF de 300 w.
Nota: Isto resulta em uma taxa de deposição de 130 Å / min (ver a Tabela de materiais para detalhes do equipamento).
Nota: Esta camada fornece um plano de chão para evitar a perda de RF através do substrato de silício e também fornece pontos de contacto para ligação de fio-almofadas. A liga de alumínio com 1% de cobre é usada para prevenir a formação de Suiça durante o processo de cozimento de alcançar um ambiente UHV. Esta composição é essencial para a prevenção dos whiskers. - Girar uma camada de 2 µm de espessura de fotorresiste positiva sobre a bolacha e Litograficamente padrão para definir o avião e ligação do fio-almofadas de protecção RF.
Nota: Os parâmetros de processo para a 2 µm de espessura fotorresiste são: velocidade de 5.000 rpm de girar, girar o tempo de 40 s, pre-Asse temperatura de 95 ° C, tempo de pre-Asse de 90 s, energia de exposição de 144 mJ/cm 2, desenvolver o tempo de 60 s, pós-Asse temperatura de 110 ° C e pós-Asse tempo de 5 min (consulte a Tabela de materiais para detalhes químicos e equipamentos). - Padrão a 1,5 µm de espessura Al/Cu (1%) camada usando um processo de gravação a seco do traço convencional (gravura de íon reativo (RIE) ou gravura de plasma de acoplamento indutivo (ICP)), com o fotorresiste estampado em passo 1.1.5 como a máscara de gravura.
Nota: Um gravador ICP deve ser usado com os seguintes parâmetros de processo: BCl 3 vazão de 20 sccm, taxa de fluxo de 2 Cl de 30 sccm, pressão de 5 mTorr e potência de RF de 750 w. Isso resulta em uma taxa de ataque ácido de 3.600 Å/min (ver a Tabela de materiais para detalhes do equipamento). - Remover o fotorresiste usado no processo de incineração de plasma do passo 1.1.6 usung um O 2 ( Figura 3b).
Nota: Os parâmetros de processo para o processo de incineração são: O 2 caudal de 150 sccm, pressão de 0,75 mTorr e potência de RF de 300 W (veja a Tabela de materiais para detalhes do equipamento). - Depositar uma camada de 2 SiO µm de espessura 14 nos dois lados do wafer usando processos de deposição (PECVD) aprimorado plasma de vapor químico ( Figura 3C).
Nota: Os parâmetros de processo, utilizados no processo de PECVD são: SiH 4 taxa de fluxo do sccm 540, pressão de 1,9 Torr, processo temperatura de 350 ° C e potência de RF de 750 w. Isso resulta em uma taxa de deposição de 3.000 Å / min (ver a Tabela de materiais para detalhes do equipamento). Como depositar camada 14 µm de espessura SiO 2 é um dos processos mais difíceis, os detalhes são descritos na discussão. - Girar uma camada de 6 µm de espessura de fotorresiste positivo na frente do wafer e Litograficamente padrão para definir através de buracos para conectar eletricamente eletrodos DC para as ligação do fio-almofadas.
Nota: Os parâmetros de processo para a 6 µm de espessura fotorresiste são: velocidade de 5.000 rpm de rotação, girar o tempo de 40 s, pre-Asse temperatura de 95 ° C, tempo de pre-Asse de 5 min, energia de exposição de 900 mJ/cm 2, desenvolver o tempo de 10 min, pós-assar a temperatura de 110 ° C e pós-Asse tempo de 5 min (consulte a Tabela de materiais para detalhes químicos e equipamentos).
14 µm de espessura SiO 2 camada na frente do wafer usando um processo convencional de RIE, com o fotorresiste estampado em passo 1.1.9 como a máscara de gravura de padrão de - .
Nota: Os parâmetros de processo para SiO 2 gravura são: CHF 3 vazão de 25 sccm, CF 4 vazão de 5 sccm, taxa de fluxo de Ar de 50 sccm, pressão de 130 mTorr e potência de RF de 600 w. Isso resulta em uma taxa de ataque ácido de 3.600 Å/min (ver a Tabela de materiais para detalhes do equipamento). - Remover o fotorresiste usado na etapa 1.1.10 com um processo de incineração O plasma de 2. Mergulhe a bolacha em um solvente aquecido ou proceda à sonicação isso antes de incineração ( Figura 3d).
- Girar uma camada fotorresiste positivo de 6 µm de espessura na parte traseira do wafer e Litograficamente padrão para formar uma máscara de óxido duro para a gravura de íon profundo reativa (DRIE) de substrato de silício ( Figura 3j).
- Padrão de 14 µm de espessura SiO 2 camadas na parte posterior do wafer usando um processo convencional de RIE, com o fotorresiste estampados em passo 1.1.12 como a máscara de gravura.
- Remover o fotorresiste usado na etapa 1.1.13 com um processo de incineração de plasma ( Figura 3e) O 2.
- Depositar uma camada de Al/Cu (1%) 1,5 µm de espessura, que é usado como o elétrodo usando um processo de pulverização catódica.
- Depositar uma 1 camada de 2 µm de espessura SiO sobre a bolacha usando um processo PECVD ( Figura 3f).
- Girar uma camada de 2 µm de espessura de fotorresiste positiva sobre a bolacha e Litograficamente padrão para definir os eletrodos.
- Pattern the 1.5 µm-thick Al/Cu (1%) camada e 1 µm de espessura SiO 2 camada usando um convencional ICP gravando o processo, com o fotorresiste estampados em passo 1.1.17 como a máscara de gravura.
- Remover o fotorresiste usado na etapa 1.1.18 com um processo de incineração de plasma ( Figura 3 g) O 2.
- Girar uma camada de 6 µm de espessura de fotorresiste positiva sobre a bolacha e Litograficamente padrão para definir os padrões de pilar 14 µm de espessura óxido.
- Padrão de 14 µm de espessura SiO 2 camadas usando um processo convencional de RIE, com o fotorresiste estampados em passo 1.1.20 como a máscara de gravura.
- Remover o fotorresiste usado na etapa 1.1.21 com um processo de incineração de plasma ( Figura 3-h) O 2.
- Girar uma camada de 6 µm de espessura de fotorresiste positiva sobre a bolacha e Litograficamente para expor o slot de carregamento padrão.
- Padrão de SiO 2 e processam Si 3 N 4 camadas usando um RIE convencional, com o fotorresiste estampado em passo 1.1.23 como a máscara de gravura.
- Remover o fotorresiste usado na etapa 1.1.24 com um processo de incineração de plasma ( Figura 3i) O 2. O substrato de silício da parte traseira do wafer usando um processo DRIE ( Figura 3j) de padrão de
- .
Nota: A profundidade do etch deve ser mensurada repetidamente para impedir a penetração do substrato de silício da parte traseira. O alvo etch profundidade é de cerca de 450-470 µm. O processo DRIE foi realizado com iterações de deposição de 8 4 F C por 5 s, C, 4 F 8 etch para 3 s e Si etch por 5 s. O C 4 F 8 deposição etapa, as taxas de fluxo de 4 C F 8, SF 6 e o Ar eram 100, 0.5 e sccm 30, respectivamente. Observe que o Ar é usado para acelerar a taxa de ataque ácido de C 4 F 8 e Si, mas também é aplicada na etapa C 4 F 8 deposição, com a mesma taxa de fluxo, para estabilizar a condição de pressão. No 4 F C 8 etch passo, as taxas de fluxo foram alteradas para 0,5, 50 e 30 sccm, respectivamente. No Si etch passo, taxas de fluxo de 0,5, 100 e 30 sccm, respectivamente, foram usados. O poder do RF e a pressão da câmara foram definidos como 825 W e 23 mTorr em todas as etapas. Para estas condições, a taxa de ataque ácido de Si foi 1 µm para cada loop (consulte a Tabela de materiais para detalhes do equipamento). - a bolacha com dados em pedaços de 10 mm x 10 mm usando uma máquina de corte em cubos.
- Desanexar uma gravação que corte em cubos a morrer por mergulhá-lo em acetona 5 min. limpar o morrer por mergulhá-lo em marcha deionizada (DI) por 10 min e álcool isopropílico (IPA) por 2 min. secá-lo por 2 min a 110 ° C.
- Etch as paredes laterais dos pilares óxido para fabricar estruturas de saliência do eletrodo usando um molhado de óxido decapagem processo por 60 s em um tal de óxido tamponada (BOE), que é (NH 4 F:HF = 6:1) ( Figura 3 k). Limpe a morrer, mergulhando-o em execução DI água por 10 min e IPA para 2 min. Seque-o por 2 min a 110 ° C.
- Penetrar o íon em forma de fenda, carregando o buraco da frente do dado através de um processo DRIE.
Nota: O processo de fabricação dos chips íon-armadilha é completo neste passo ( Figura 3 l).
2. Preparação de óptica e equipamento eléctrico e aprisionando os íons
Nota: O chip de armadilha fabricada é empacotado com um portador do chip, e o portador de chip é instalado em uma câmara UHV. Enquanto os procedimentos para a fabricação do pacote de armadilha-chip e para preparar a câmara de UHV são fornecidos no Documento complementar, esta seção descreve os detalhes de configuração de equipamentos elétricos e ópticos e de íons de armadilhagem.
- Preparação de ligações eléctricas.
- Conectar um conversor digital-analógico de multi-canal (DAC) para a passagem direta na parte traseira da câmara UHV aplicar tensão para os eletrodos de controle DC correspondentes.
Nota: A Figura 4 mostra um exemplo da tensão aplicada ao chip de armadilha. O método detalhado para a concepção de tal um conjunto de tensão DC é descrito no Documento complementar. - Se conectar a uma fonte de corrente para um pino de forno na passagem direta na parte de trás.
- Adicionar um acoplador direcional entre um gerador de RF e a helicoidal ressonador. Conecte o sinal proveniente do gerador de RF para a porta de saída do acoplador direcional. Também, se conectar a porta de entrada do acoplador direcional à porta de entrada a helicoidal ressonador.
Nota: Esta configuração permite o monitoramento a energia refletida do helicoidal ressonador 36. - Ajustar a posição da PAC helicoidal ressonador e digitalizar a frequência do gerador para encontrar a frequência em que a reflexão é, no mínimo. Repita este passo até encontra-se o mínimo global.
Nota: A frequência no mínimo global é a frequência de ressonância. Uso de um analisador de espectro com um gerador de rastreamento opção ou medição do parâmetro S 11, com um analisador de rede pode simplificar o processo de digitalização para a mínima reflexão. Se qualquer uma das conexões com uma fonte de tensão DAC ou fonte atual para o forno elétricas é alterado, a impedância da passagem de RF é alterada, e mudará a frequência ressonante. - Desligar o gerador de RF.
Atenção: Quando o ressonador helicoidal é a aplicação de alta tensão de RF para a armadilha, não altere qualquer conexões elétricas que podem causar alterações de impedância. Mudanças de impedância súbita facilmente podem queimar os fios de ligação do chip.
- Conectar um conversor digital-analógico de multi-canal (DAC) para a passagem direta na parte traseira da câmara UHV aplicar tensão para os eletrodos de controle DC correspondentes.
- o alinhamento do laser 369.5 nm e o sistema de imagem.
- Desbloqueem o 369,5-nm laser de fibra óptica usando um colimador e tentar igualar a altura do colimador da superfície da tabela óptica para a altura do chip; fazer o feixe propagar horizontalmente.
- Definir a direção de propagação do feixe colimado 369,5-nm para o chip de armadilha, através de viewport esquerda ou direita da câmara UHV, conforme mostrado na Figura 5. Alinhá-lo grosseiramente tal que o raio laser se propaga paralelo à superfície armadilha-chip e quase toca a superfície do chip.
- Montar um lente de focalização para o laser 369,5-nm num palco de tradução. Coloque a lente de focalização ao longo da direção de propagação, para que o laser será focado na proximidade da posição de captura acima da superfície do chip e para que o laser focalizado se propaga ao longo da superfície de armadilha-chip. Ajuste a posição da lente com foco com o estágio da tradução; a posição do foco feixe laser seguirá o movimento da lente com foco.
- Lugar uma lente de imagem de alta--abertura numérica montada num palco de tradução na frente da câmara UHV, considerando a distância entre a superfície do chip ( Figura 5).
- Alinhar o feixe 369,5-nm com a superfície de armadilha-chip para que haja uma certa quantidade de dispersão do laser da superfície microplaqueta.
Nota: A luz espalhada recolhido pela lente de imagem irá formar uma imagem fraca em torno do plano de imagem da lente. Esta imagem geralmente pode ser observada, mesmo com papel fluorescente quando a área é suficientemente escura. - Ajustar a posição da lente da imagem latente, até que a imagem no papel fluorescente torna-se afiada.
- Lugar um elétron-multiplicado acoplados cobrado (EMCCD) montado no palco tradução, considerando a localização do plano de imagem da lente, encontrado na etapa anterior.
- Montar um filtro de infravermelho (IR) em frente a EMCCD para bloquear a radiação de corpo negro do forno quando o forno é aquecido para evaporação.
- Montar um filtro de passa-banda 369,5-nm em frente a EMCCD para bloquear a luz de fundo.
- Comparar a imagem do EMCCD com o layout dos eletrodos. Ajuste as posições da EMCCD e a lente de imagem até os eletrodos podem ser vistos com o EMCCD. Alinhar tanto a lente da imagem latente e o EMCCD até que a imagem se torna nítida.
- Identificar quais eletrodos são mostrados na EMCCD e alinham o EMCCD para coincidir com seu centro no local esperado armadilhagem.
- Alinhar o feixe 369,5-nm verticalmente para que irá passar a posição de armadilhagem. Para descobrir a distância entre o centro do feixe e a superfície de armadilha, mova o feixe em direção à superfície da armadilha até a dispersão do feixe é maximizada.
Nota: Após a etapa 2.2.12, pode-se supor que o centro do feixe está bem na superfície do chip. - De simulação numérica da armadilha potencial 29, encontrar a altura esperada da posição de armadilhagem íon da superfície da microplaqueta. Mova o feixe nm 369.5 longe da superfície do chip pela altura esperada usando o micrômetro da fase de tradução de lente. Mova a lente da imagem latente e o EMCCD volta a mesma distância. Anote as leituras de micrômetro da lente da imagem latente e o EMCCD.
- Alinhamento da 399 nm e 935 lasers de nm e o teste do forno
- Substituir as 369,5 nm bandpass filtrar com um filtro de passa-banda 399 nm. A partir da simulação numérica da lente da imagem latente, encontre a diferença entre a distância focal de 399 nm luz e da luz 369,5-nm resultantes a aberração cromática. Ajustar as posições longitudinais da lente da imagem latente e o EMCCD tornar o 399-nm centrou-se a EMCCD.
- Desbloqueem as vigas de 399 e 935 nm, entregadas a partir de fibras ópticas, com os respectivos colimadores e ajustar as alturas dos colimadores de fibra para coincidir com a altura do chip para fazer os dois feixes propagar horizontalmente.
- Alinhar o feixe de 399 nm em direção à superfície de armadilha-chip através de outra viewport, tal que a 399 nm do laser está propagando na direção oposta do laser 369.5 nm. Tente fazer o colimado 399 nm laser de sobreposição com o laser focalizado de nm 369.5.
- Combinar o feixe colimado de nm 935 com o colimado 399 nm do laser utilizando um espelho dicroico e alinhar o feixe de 935 nm tal que o 935 nm do laser Co propaga com o laser de 399-nm. Para verificar o quão bem os dois feixes se sobrepõem uns com os outros, desvie desses dois feixes com um espelho temporário antes de entrar na câmara e medir os locais das vigas ao longo do caminho do feixe usando um gerador de perfil de feixe ou uma pinhole. Se o espaço for insuficiente para a colocação do espelho temporário entre a câmara e a lente de focalização, considere colocar a configuração óptica em uma pequena experimentação ótica; o grau de sobreposição pode ser verificado em um lugar separado.
- Montar uma lente de focalização para ambos os lasers em um estágio de tradução adicionais e definir a lente com foco entre o espelho dicroico e o espelho temporário. Estimar a distância do espelho temporária para a posição de armadilhagem e ajustar a localização da focagem lente tal que a 399 nm do laser está focada na posição de captura ( Figura 6b).
- Verificar se o foco do laser 399 nm coincide com o foco do laser 935 nm. Se os dois focos não se sobrepõem, finamente ajustar o laser de nm a 935.
- Remover o espelho temporário no caminho 399 nm do laser. Verifique o rastreamento do 399 nm laser sobre a superfície de microplaqueta usando EMCCD. Se nenhum vestígio do feixe de laser de 399 nm pode ser observado, mova o caminho de feixe 399 nm em torno do chip. Também, ligeiramente ajustar a distância entre a câmara e a lente da imagem latente, até que a imagem da superfície do chip torna-se afiada.
- Alinhar o rastreamento do feixe 399 nm na superfície do chip tal que vai passar a posição esperada de armadilhagem. Semelhantes para o alinhamento de feixe 369.5 nm, move o feixe de 399 nm em direção à superfície do chip até a intensidade da luz dispersa se torna maximizada.
- Mover o feixe de laser 399 nm longe da superfície do chip, a mesma altura que usou na etapa 2.2.13 usando um micrômetro. Mover a lente da imagem latente e o EMCCD volta pela mesma distância.
- Colocar o espelho temporário usado na etapa 2.3.4 de volta. Repita a etapa 2.3.6 e remova o espelho temporário.
Nota: Após a etapa 2.3.10, a 935 nm do laser pode ser assumido para ser passar pela posição de captura acima da superfície do chip. - Definir o comprimento de onda do laser 399 nm perto a 1 S 0-1 P 1 transição de 174 Yb (751.526 GHz). Ligue a corrente para o forno cheio de Yb de ocorrência natural e gradualmente aumentar a corrente.
Nota: em geral, evaporação não é necessariamente iniciado na mesma corrente encontrada pelo analisador do gás residual (RGA), conforme descrito no Documento complementar, então Experimente diferentes valores atuais até evaporação é observada. Somente quando os átomos neutros de Yb começam a evaporar e a frequência do laser é ressonante com o 1 S 0-1 P 1 transição de um dos isótopos Yb, o Yb neutro átomos vão começar a absorver o laser de luz e re-emitir é tal que a fluorescência do Yb pode ser observada com o EMCCD. Geralmente, as frequências ressonantes medidas por um medidor de comprimento de onda são deslocadas dos valores nominais, variando de dezenas a centenas de MHz. Portanto, para cada configuração atual, digitalização a frequência do laser com uma gama de calibração de 1 GHz e um passo de menos de 50 MHz é recomendado. - Uma vez que a fluorescência ressonante do forno ocorre naturalmente é observada, reduza a corrente até a fluorescência não pode ser observada.
- Varredura a laser em torno a primeira frequência de ressonância e anote a quantidade de fluorescência em cada ressonância. Compare a distribuição da força de fluorescência e o espaçamento entre as ressonâncias com os valores do 37. Identificar as frequências de ressonância para os diferentes isótopos.
Nota: A ressonância de 174 Yb foi medida para ser aproximadamente 751.52646(2) THz. No entanto, este valor é ligeiramente deslocado pelo efeito Doppler, e o valor medido pode variar dependendo da precisão do medidor de comprimento de onda.
- Trapping íons.
- Substituir o filtro de passa-banda 399 nm com o filtro de passa-banda 369.5 nm e mover a lente da imagem latente e o EMCCD de volta para a posição obtida na etapa 2.2.13 para que a 369,5-nm fluorescência emitida por íons presos pode ser fotografada no EMCCD. Verifique o alinhamento de todos os lasers mais uma vez, repetindo o passo 2.2.12 e usando o UV e IR ver placas para a inspeção visual de sobreposição do feixe.
- Verificar que as tensões do DAC umestá configurado corretamente. Liga o gerador de RF em uma configuração de energia muito baixa e gradualmente aumentar a potência de saída. Além disso, certifique-se de que a energia refletida da helicoidal ressonador é ainda o mínimo pela verificação da frequência de RF próximo a ressonância.
Atenção: Certifique-se que a tensão amplificada para o chip de armadilha não exceda a tensão de ruptura. Na pressão atmosférica, a rigidez dielétrica de um filme de 2 SiO é conhecida por ser aproximadamente 10 7 V/cm, mas esse valor não pode ser presumida no ambiente UHV. Embora a tensão exata no ambiente UHV explicitamente não é medido, a abertura lateral 8-µm da armadilha do chip em um 10 -11-Torr vácuo suporta 240 V da amplitude de tensão de RF na configuração experimental. - Definir a frequência do laser 399 nm para a frequência de ressonância dos 174 Yb, identificado na etapa 2.3.13. Defina a frequência do laser 935-nm para o isótopo de Yb + 174.
Nota: Com um metro de comprimento de onda, 320.57199(1) THz pode ser usado, mas devido a precisão limitada de metros de comprimento de onda, pode haver uma variação até dezenas de MHz. - Definir a frequência do laser 369,5-nm em um valor que é ~ 100-200 MHz, menor que a frequência de ressonância então que, mesmo se houver alguma quantidade de imprecisão com o medidor de comprimento de onda, a frequência será ainda vermelho-dessintonizada.
Nota: Aqui, 200 MHz dessintonia é subtraída a ressonância esperada quando a frequência de ressonância esperada da 174 Yb + é em torno de 811.29152(1) THz. - Ligar a fonte atual para o forno e o aumento da corrente lentamente até que se atinge o valor encontrado na etapa 2.3.12. Espere por alguns minutos. Se nenhum íon é prendido, aumentar a corrente de ~0.1-0.2 A e espere novamente. Se o íon ainda não fique preso, verificar se o RF refletida é ainda no mínimo e depois, gradualmente aumentar a potência de saída do gerador de RF.
Atenção: Certifique-se que a tensão amplificada para o chip de armadilha não exceda a tensão de ruptura esperada. - Brevemente bloquear o 935 nm do laser e verificar se há qualquer alteração na imagem.
Nota: Se as configurações de EMCCD (incluindo a multiplicação de elétron (EM) ganho, tempo de exposição e contraste da imagem) não são dentro de um intervalo adequado, mesmo quando um íon é preso, não é fácil dizer se a mudança de intensidade nas proximidades da região de armadilhas é causada por um íon preso real ou pela alteração de dispersão do laser 369.5 nm. Por causa do filtro IR, a câmara EMCCD não mostra qualquer alteração em 935 nm do laser, bloqueando a 935 nm do laser não faz qualquer alteração para a imagem quando não há nenhum íon preso. No entanto, se um íon é prendido, a taxa de dispersão do laser 369.5 nm cai significativamente sem o 935 nm do laser. Portanto, a mudança para a imagem EMCCD causada por bloqueio a 935 nm do laser é um bom indicador do sucesso de íons de armadilhagem.
Atenção: Se o 935 nm do laser é bloqueado por muito tempo, o íon preso fica aquecido e pode escapar da armadilha. - Desligue o forno após os íons estão presos. Tente encontrar a ressonância do 369.5 nm laser aumentando gradualmente a frequência.
Nota: Enquanto a frequência se aproxima para a ressonância, a taxa de dispersão aumentará, mas uma vez que a ressonância é atravessada, o laser nm 369.5 começa o íon de aquecimento ao invés de refrigerá-lo, que por sua vez causas a imagem do íon preso tornar-se instável. Uma vez que encontra-se a frequência de ressonância do laser 369.5 nm, reduzir a frequência do laser por 10MHz de ressonância. - Verificar a frequência do laser 935 nm até a taxa de dispersão de 369.5 nm Obtém maximizada.
- Ajustar a localização da lente da imagem latente e a câmera EMCCD até a imagem do íon aguça.
Resultados
A Figura 7 mostra as digitalização micrografias de elétron (SEM) do chip fabricado íon-armadilha. Os eletrodos RF, interiores eletrodos DC, exteriores eletrodos DC e slot de carregamento foram fabricados com êxito. O perfil da parede lateral do pilar dieléctrico tornou-se irregular porque o óxido PECVD foi depositado em várias etapas. As várias etapas de deposição foram usadas para minimizar os efeitos da tensão residual de películas de óxido grossa. Isto é ainda mais descrito na discussão.
A Figura 8 mostra a imagem EMCCD de cinco íons de Yb+ 174presos usando o chip do íon-armadilha de microfabricated. Os íons presos podem durar mais de 24 h com Doppler contínuo de resfriamento. O número de íons presos pode ser ajustado entre 1 e 20, alterando o conjunto de tensão aplicado DC. Esta configuração experimental é muito confiável e robusto e atualmente tem estado em funcionamento durante 50 meses.
A Figura 9 mostra o vaivém de íons presos ao longo da direção axial. A posição de íon na Figura 9b é deslocada do que na Figura 9a através do ajuste da posição do mínimo potencial DC alterando as tensões DC.
A Figura 10 mostra os resultados preliminares de experimentos de oscilação de Rabi com um íon de Yb+ 171. Para obter os resultados, foram utilizadas as configurações adicionais descritas no Documento complementar . Os resultados foram incluídos para mostrar a uma potencial aplicação da instalação experimental explicada neste artigo.
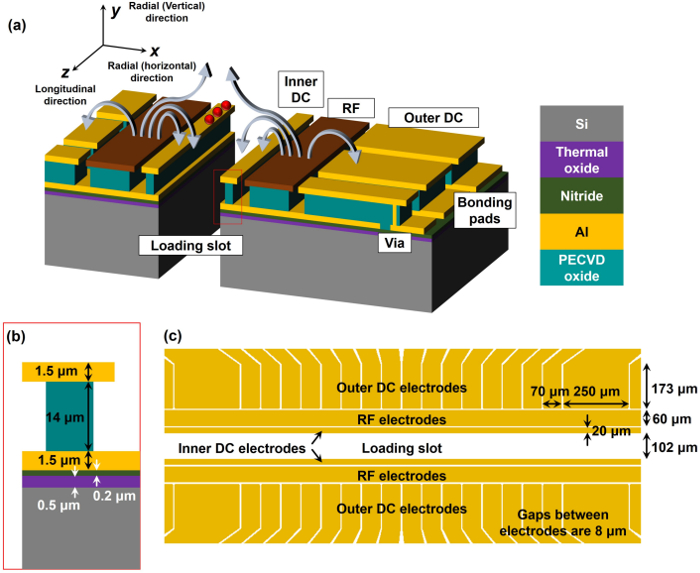
Figura 1: esquemático da armadilha do íon superfície. (um) vermelho pontos representam os íons presos. Os eletrodos de marrons e amarelos indicam os eléctrodos de RF e DC, respectivamente. As cinza setas mostram a direção do campo elétrico durante a fase positiva da tensão de RF. Observe que o esquema não está desenhado em escala. (b) vertical dimensões da estrutura do eletrodo. Dimensões (c), o lateral da estrutura de eletrodo. Clique aqui para ver uma versão maior desta figura.
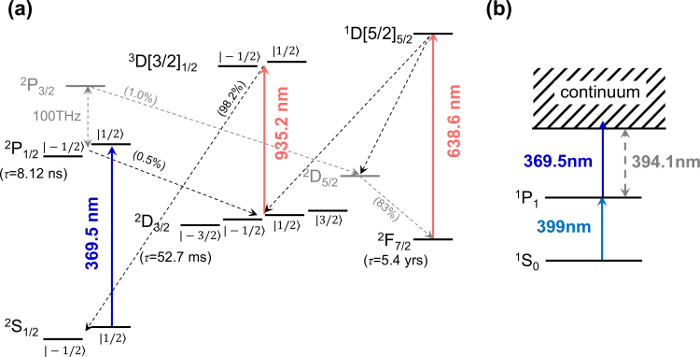
Figura 2: Diagrama de energia-nível simplificado de um íon de Yb+ 174e um átomo de Yb neutro 174. (um) quando um 369.5 nm laser é dessintonizado para o lado vermelho (baixa frequência) de ressonância, uma transição ciclismo entre 2P1/2 e 2S1/2 reduz a energia cinética do íon por causa do Doppler efeito. Ocasionalmente, um rácio de ramificação pequeno mas finito faz o decaimento de elétrons de 2P1/2 2D3/2, e um laser de 935-nm é necessário para retornar o elétron volta para a transição de ciclismo principal. O elétron também pode decair em um estado de7/2 2F uma vez por hora, em média e um laser nm 638 podemos bombeá-lo fora do estado de7/2 2F, mas isso não é necessário para um sistema simples de38. Os valores na notação ket representam as projeções do momento angular total J ao longo do eixo de quantização mJ. (b) para ionizar átomos neutros evaporados do forno, um processo de absorção de dois fótons foi usado39. Um laser de nm 399 animado um elétron para 1P1 estado, e o fóton nm 369.5 para arrefecimento Doppler tinha mais energia do que o necessário para remover o elétron excitado o íon. Clique aqui para ver uma versão maior desta figura.
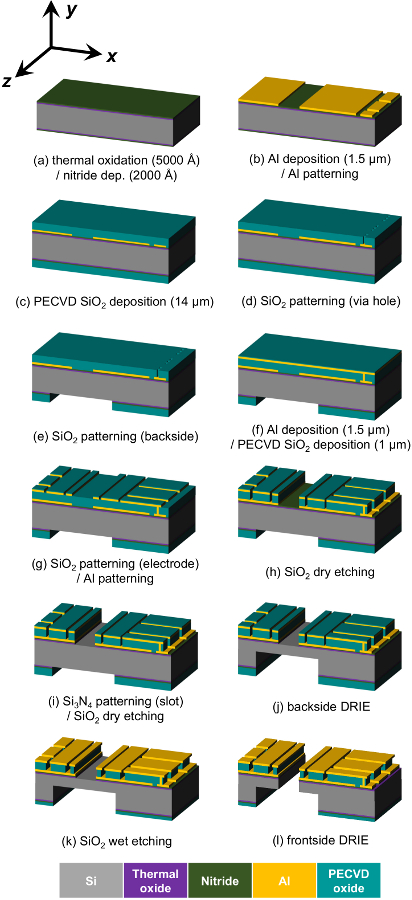
Figura 3: fluxo de processo de fabricação de uma superfície ion trap. (um) térmico oxidação para crescer um 5.000 Å de espessura SiO2 camada e LPCVD de uma camada de4 3N Si 2.000 Å de espessura. gravura de deposição e ICP (b) de 1,5 µm de espessura sputtered Al camada. (c) deposição de um 14 µm de espessura SiO2 camada as ambos os lados do wafer usando processos PECVD. (d) padronização da 14 µm de espessura SiO2 camada depositada na frente do wafer usando um processo RIE (e) a padronização da camada 14 µm de espessura SiO2 depositado na parte de trás do wafer usando um processo RIE. (f), deposição de um 1,5 µm-grossa atomizados Al camada e uma 1 camada de2 µm de espessura PECVD SiO. processo de padronização de camada de Al 1,5 µm de espessura através de um processo ICP e 1 µm de espessura SiO2 camada usando um RIE (g). (h) a padronização da camada 14 µm de espessura SiO2 depositado na frente do wafer usando um processo RIE. (eu) processo de padronização da 5.000 Å de espessura SiO2 camada e a camada4 de3N Å de espessura Si 2.000 usando um RIE. (j) DRIE do substrato de silício 450 µm da parte traseira do wafer. (k) molhado-gravura da camada2 SiO sobre os eletrodos de Al e as paredes laterais dos pilares dielétricos. (l) penetração do substrato de frente através de um processo DRIE silício. Observe que as plantas não são desenhadas em escala. Clique aqui para ver uma versão maior desta figura.
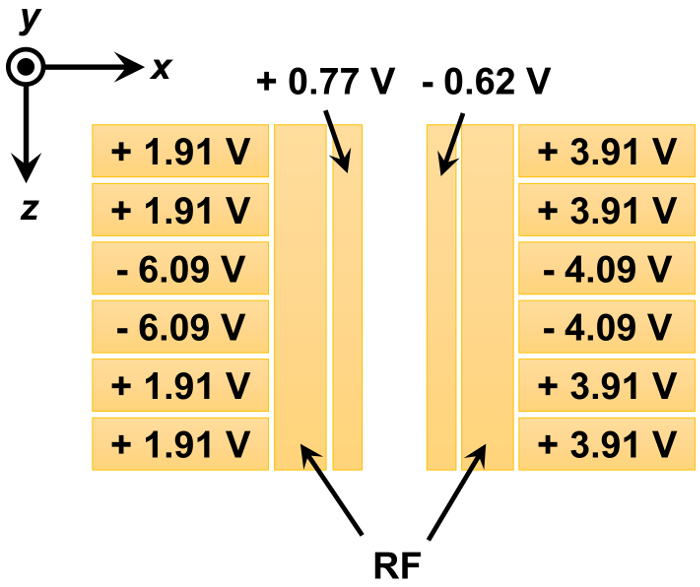
Figura 4: um exemplo da tensão DC conjunto usado para aprisionar íons. As tensões aplicadas aos trilhos internos podem compensar o campo elétrico assimétrico na direção horizontal para inclinar os eixos principais do potencial total no plano transversal. A frequência de armadilha axial gerada pelo conjunto de tensão foi 550 kHz. Clique aqui para ver uma versão maior desta figura.
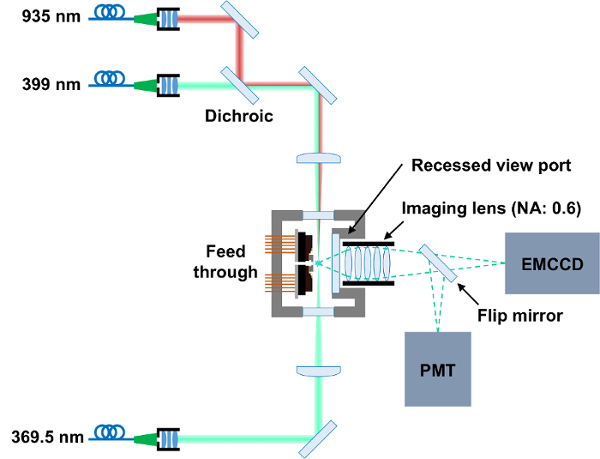
Figura 5: esquema da instalação do óptica. Três lasers de diodo estão alinhados para sobrepor-se na posição de armadilhagem. Recesso da câmara UHV viewport permite que a lente da imagem latente ser colocado tão próximo quanto possível para o chip de superfície. Um flip-espelho colocado entre a lente da imagem latente e o EMCCD permite a monitorização selectiva da fluorescência íon usando um tubo de fóton multiplicado (PMT) ou um EMCCD. Clique aqui para ver uma versão maior desta figura.

Figura 6: imagens da instalação do óptica construída. (um) A bobina é enrolada ao redor do visor frontal da câmara para gerar um campo magnético, que pode quebrar degenerados níveis de energia de íons de itérbio. (b) a configuração óptica para dirigir a 399 nm e 935 nm de vigas. As linhas vermelhas e verdes indicam o caminho do feixe da 935 nm e 399 lasers de nm, respectivamente. (c), a configuração da imagem da sistema, incluindo o flip-espelho, a lente da imagem latente, o EMCCD e o pgto. O caminho da fluorescência emitida por íons de presa pode ser determinado pelo flip-espelho. As setas verdes e brancas indicam o caminho da fluorescência quando sendo monitorado pelo EMCCD e o pgto, respectivamente. Clique aqui para ver uma versão maior desta figura.
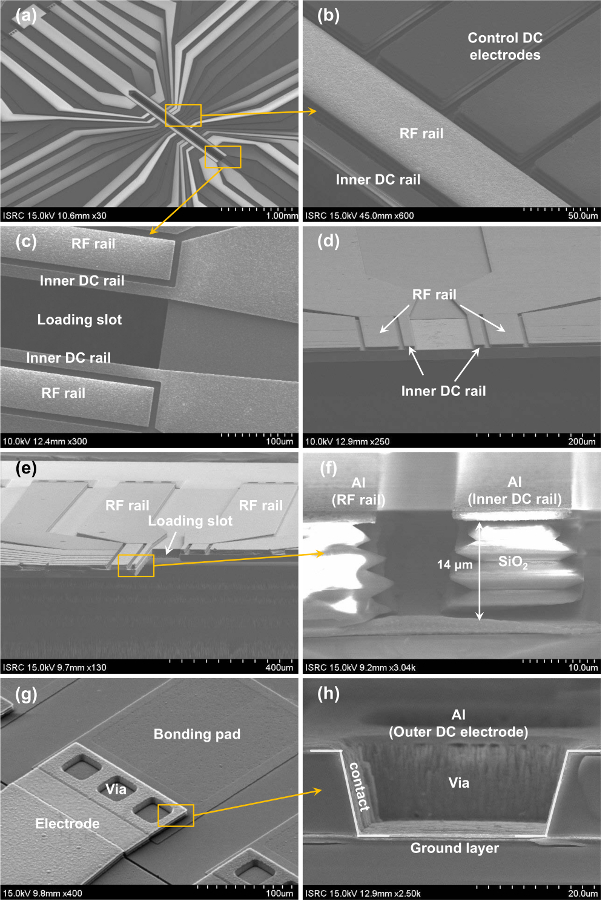
Figura 7: resultados de fabricação da armadilha do íon superfície. (a) visão geral do layout da microplaqueta. (b) uma vista ampliada do layout da microplaqueta, que mostra vários eletrodos DC exteriores. (c) uma vista ampliada do layout do chip, o que mostra o slot de carregamento. (d) uma seção transversal vista da região antes de penetrar o slot de carregamento de armadilhagem. (e) uma seção transversal vista da região de armadilhagem após penetrar o slot de carregamento. (f) A ampliada vista transversal do pilar de óxido. Os pilares de óxido têm irregulares paredes, e os comprimentos da saliência não são suficientes, que é atribuído para a taxa de ataque ácido não-uniforme do SiO2 para as interfaces entre as separadamente depositados 3,5 µm de espessura SiO2 camadas. (g), uma vista superior de uma fio de ligação-almofada de um eletrodo de DC. (h), A vista transversal de uma via. Perfis inclinados dos pilares óxido permitem a conexão do eléctrodo DC e a camada de solo durante a deposição da camada na parede lateral do pilar em vez de enchimento óxido Al o através de orifícios com um processo de galvanização. Clique aqui para ver uma versão maior desta figura.
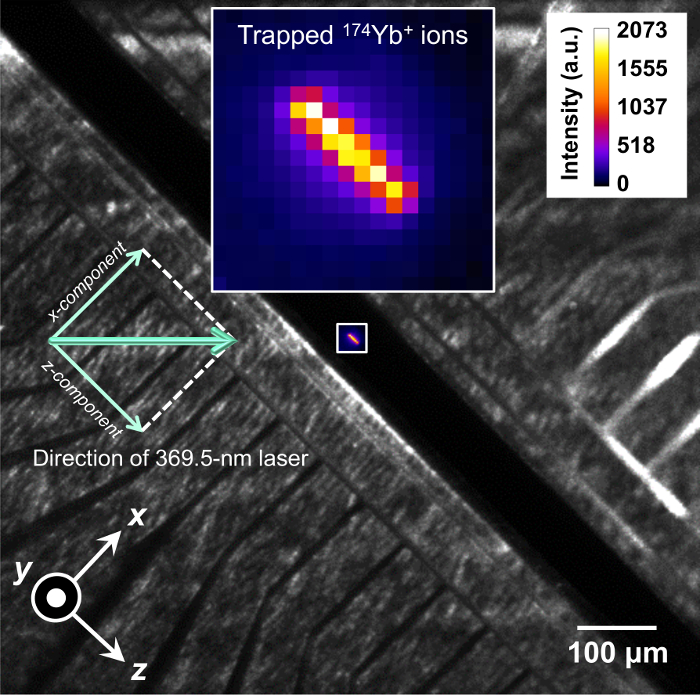
Figura 8: imagem de um EMCCD de cinco íons de Yb+ 174presos no chip íon-armadilha microfabricated. A imagem da estrutura de eletrodos de superfície armadilha foi tirada separadamente, e as imagens do íon preso e dos eletrodos foram combinadas para maior clareza. A lenda de intensidade aplica-se somente para os pixels na caixa. A seta grossa mostra o caminho do feixe do laser 369.5 nm e as setas finas representam o x-z-componentes e o embalo do fotão. Clique aqui para ver uma versão maior desta figura.

Figura 9: ajuste do potencial axial dos íons presos numa cadeia linear. (um) sete íons no centro da armadilha. (b) os íons foram transporte dezenas de micrômetros. (c) a sequência de caracteres de íon espremido na direção axial. Esta figura é melhor visualizada como um filme, que é carregado separadamente. Clique aqui para ver uma versão maior desta figura.

Figura 10: Resultados experimentais das oscilações de Rabi entre o | 0  e | 1
e | 1  Estados-Membros. | 0
Estados-Membros. | 0 é definido como 2S1/2| F = 0, m,F= 0
é definido como 2S1/2| F = 0, m,F= 0 estado do íon 171Yb+ , e | 1
estado do íon 171Yb+ , e | 1 é definido como 2S1/2| F = 1, m,F= 0
é definido como 2S1/2| F = 1, m,F= 0 estado. A oscilação de Rabi é induzida pela 12,6428-GHz microondas. Esferas de Bloch acima o enredo mostram os estados quânticos correspondentes em momentos diferentes. Clique aqui para ver uma versão maior desta figura.
estado. A oscilação de Rabi é induzida pela 12,6428-GHz microondas. Esferas de Bloch acima o enredo mostram os estados quânticos correspondentes em momentos diferentes. Clique aqui para ver uma versão maior desta figura.
Documento complementar: Clique aqui para baixar este documento.
Discussão
Este trabalho apresentou um método para íons de captura com armadilhas de íon microfabricated superfície. A construção de um sistema de captura de íon requer experiências em vários campos de pesquisa, mas não anteriormente foi descrita em detalhe. Este papel fornecido os procedimentos detalhados para microfabricating um chip de armadilha, bem como para a construção de uma instalação experimental para armadilha de íons pela primeira vez. Este papel também forneceu os procedimentos detalhados para aprisionando 174íons de Yb+ e experimentando com íons presos.
Um obstáculo enfrentado nos procedimentos microfabrication é a deposição da camada dielétrica, com uma espessura de mais de 10 µm. Durante o processo de deposição da grossa camada dielétrica, tensão residual pode acumular-se, que pode causar danos ao filme dielétrico ou mesmo quebrar a bolacha. Para reduzir a tensão residual, que é geralmente à compressão, uma taxa de deposição lenta deve ser usado40. No nosso caso, um esforço compressivo de 110,4 MPa foi medido com as condições de deposição de 540 sccm de SiH4 taxa de fluxo de gás, 140 W de RF potência e 1,9 Torr de pressão em 5 µm de espessura de película. No entanto, estas condições de processo fornecem apenas uma referência de áspera, desde que estas condições podem variar significativamente para equipamentos diferentes. Para reduzir os efeitos do stress acumulado, 3,5 filmes de2 µm de espessura SiO foram depositados atender em ambos os lados da bolacha no método apresentado. A espessura necessária da camada dielétrica pode ser reduzida se um menor amplitude de tensão de RF e, portanto, uma profundidade de armadilha é escolhida. No entanto, uma profundidade de armadilha facilmente leva para a fuga de presos íons, para a fabricação de camadas dielétricas mais espessas, que podem suportar umas mais altas tensões de RF, é mais desejável.
Existem algumas limitações para o método de fabricação apresentado neste trabalho. Os comprimentos das saliências não são suficientes para esconder completamente os sidewalls dieléctricos de íons de presos, como mostrado na Figura 7f. Além disso, as paredes laterais dos pilares óxido são irregulares, aumentando a área exposta das paredes laterais dielétricas em comparação com o pilar de óxido vertical. Por exemplo, no caso da parede lateral do trilho interno DC perto o slot de carregamento com uma saliência de uniforme de 5 µm, calcula-se que 33% da superfície do dielétrica é exposto para a posição de íon preso da parede lateral do vertical. No caso de borda irregular, mais de 70% da área do sidewall é exposta. Estes resultados não-ideal de fabricação podem induzir campos parasitas adicionais dos dielétricos expostos, mas os efeitos não foram medidos quantitativamente. No entanto, o chip fabricado conforme relatado acima tem sido utilizado com sucesso em íon trapping e experimentos de manipulação qubit. Além disso, o chip de armadilha apresentado neste trabalho tem exposto paredes laterais de silício perto o slot de carregamento. Óxido nativo pode crescer nas superfícies de silício e pode resultar em fluxos adicionais de campos. Portanto, é recomendável para proteger o substrato de silício com uma camada adicional de metal, como em33.
Para interceptar íons de Yb+ 174, as frequências dos lasers devem ser estabilizadas dentro de algumas dezenas de megahertz, e alguns métodos diferentes são discutidos em configurações avançadas,38,41. No entanto, para a configuração simples discutida neste artigo, captura inicial é possível somente com estabilização usando um medidor de comprimento de onda.
Este papel fornecido um protocolo para interceptar íons de Yb+ 174usando um chip de superfície íon-armadilha de microfabricated. Embora o protocolo para aprisionando os íons de Yb+ 171especificamente não é discutido, a instalação experimental descrita neste artigo pode ser usada também para armadilha de íons de 171Yb+ e manipular o estado qubit do 171 Íons de Yb+ para obter o Rabi resultados de oscilação (mostrado na Figura 10). Isso pode ser feito adicionando vários moduladores ópticos para a saída dos lasers e usando uma configuração de microondas, conforme descrito no Documento complementar.
Em conclusão, os métodos experimentais e os resultados apresentados neste artigo podem ser usados para desenvolver várias aplicações de informação quântica usando armadilhas superfície do íon.
Divulgações
Os autores não têm nada para divulgar.
Agradecimentos
Esta pesquisa foi parcialmente suportada pelo Ministério da ciência, TIC, e planejamento de futuro (MSIP), Coreia, sob o centro de pesquisa tecnologia informação (ITRC) apoiar o programa (IITP-2017-2015-0-00385) e o ICT R & (10043464, desenvolvimento de programa em D quântica tecnologia repetidor para o aplicativo para sistemas de comunicação), supervisionado pelo Instituto de informação & promoção de tecnologia de comunicações (IITP).
Materiais
| Name | Company | Catalog Number | Comments |
| photoresist used for 2-μm spin coating | AZ Materials | AZ7220 | Discontinued. Easily replaced by other alternative photoresist product. |
| photoresist used for 6-μm spin coating | AZ Materials | AZ4620 | Discontinued. Easily replaced by other alternative photoresist product. |
| ceramic chip carrier | NTK | IPKX0F1-8180BA | |
| epoxy compound | Epotek | 353ND | |
| Plasma enhanced chemical vapor deposition (PECVD) system | Oxford Instruments | PlasmaPro System100 | |
| Low pressure chemical vapor deposition (LPCVD) system | Centrotherm | E-1200 | |
| Furnace | Seltron | SHF-150 | |
| Sputter | Muhan Vacuum | MHS-1500 | |
| Manual aligner | Karl-Suss | MA-6 | |
| Deep Si etcher | Plasma-Therm | SLR-770-10R-B | |
| Inductive coupled plasma (ICP) etcher | Oxford Instruments | PlasmaPro System100 Cobra | |
| Reactive ion etching (RIE) etcher | Applied Materials | P-5000 | |
| Boundary element method (BEM) software | CPO Ltd. | Charged Particle Optics | |
| Single crystaline (100) silicon wafer | STC | 4SWP02 | 100 mm / (100) / P-type / SSP / 525±25 μm |
| metal tubes | Mcmaster-carr | 89935K69 | 316 Stainless Steel Tubing, 0.042" OD, 0.004" Wall Thickness |
| Yb piece | Goodfellow | YB005110 | Ytterbium wire, purity 99.9% |
| enriched 171Yb | Oak Ridge National Laboratory | Yb-171 | https://www.isotopes.gov/catalog/product.php?element=Ytterbium |
| tantalum foil | The Nilaco Corporation | TI-453401 | 0.25x130x100mm 99.5% |
| Kapton-insulated copper wire | Accu-glass | 18AWG (silver plated copper wire kapton insulted) | |
| residual gas analyzer (RGA) | SRS | RGA200 | |
| turbo pump | Agilent | Twistorr84 FS | |
| all-metal valve | KJL | manual SS All-Metal Angle Valves (CF flanged) | |
| Leak detector (used as a rough pump) | Varian | PD03 | |
| ion gauges | Agilent | UHV-24p | |
| ion pump | Agilent | VacIon Plus 20 | |
| NEG pump | SAES Getters | CapaciTorr D400 | |
| spherical octagon | Kimball Physics | MCF600-SphOct-F2C8 | |
| ZIF socket | Tactic Electronics | P/N 100-4680-002A | |
| multi-pin feedthroughs | Accu-Glass | 6-100531 | |
| 25 D-sub gender adapters | Accu-Glass | 104101 | |
| Recessed viewport | Culham Centre for Fusion Energy | 100CF 316LN+20.9 Re-Entrant 316 (Custom order) | Disc material: 60cv Fused Silica 4mm THK, TWE Lambda 1/10, 20/10 Scratch-Dig |
| Recessed viewport AR coating | LaserOptik | AR355nm/0-6° HT370-650nm/0-36° on UHV (Custom order) | AR coating was performed in the middle of the fabrication of the recessed viewport |
| Digital-analog converter | AdLink | PCIe-6216V-GL | |
| 369.5nm laser | Toptica | TA-SHG Pro | |
| 369.5nm laser | Moglabs | ECD004 + 370LD10 + DLC102/HC | |
| 399nm laser | Toptica | DL 100 | |
| 935nm laser | Toptica | DL 100 | |
| 369.5nm & 399nm optical fiber | Coherent | NUV-320-K1 | Patch cables are connectorized by Costal Connections. |
| 935nm optical fiber | GouldFiber Optics | PSK-000626 | 50/50 fiber beam splitter made of Corning HI-780 single mode fiber to combine 935nm and 638nm together. |
| Wavelength meter | High Finesse | WSU-2 | |
| temporary mirror | Thorlabs | PF10-03-P01 | |
| Dichroic mirror | Semrock | FF647-SDi01-25x36 | |
| 369.5nm & 399nm collimator | Micro Laser Systems | FC5-UV-T/A | |
| 935nm collimator | Schäfter + Kirchhoff | 60FC-0-M8-10 | |
| 369.5nm focusing lens | CVI | PLCX-25.4-77.3-UV-355-399 | Focal length: ~163mm @ 369.5nm |
| 399nm & 935nm focusing lens | CVI | PLCX-25.4-64.4-UV-355-399 | Focal length: ~137mm @ 399nm, ~143mm @ 935nm |
| imaging lens | Photon Gear | P/N 15470 | |
| 369.5nm bandpass filter | Semrock | FF01-370/6-25 | |
| 399nm bandpass filter | Semrock | FF01-395/11-25 | |
| IR filter | Semrock | FF01-650/SP-25 | |
| EMCCD camera | Andor Technology | DU-897U-CS0-EXF | |
| PMT | Hamamatsu | H10682-210 |
Referências
- Wineland, D. J. Nobel Lecture: Superposition, entanglement, and raising Schrödinger's cat. Rev Mod Phys. 85 (3), 1103 (2013).
- Blatt, R., Wineland, D. Entangled states of trapped atomic ions. Nature. 453 (7198), 1008-1015 (2008).
- Leibfried, D., Blatt, R., Monroe, C., Wineland, D. Quantum dynamics of single trapped ions. Rev Mod Phys. 75 (1), 281 (2003).
- Paul, W. Electromagnetic traps for charged and neutral particles. Rev Mod Phys. 62 (3), 531 (1990).
- Rosenband, T., et al. Frequency ratio of Al+ and Hg+ single-ion optical clocks; metrology at the 17th decimal place. Science. 319 (5871), 1808-1812 (2008).
- Dawson, P. H. . Quadrupole mass spectrometry and its applications. , (2013).
- Ladd, T. D., Jelezko, F., Laflamme, R., Nakamura, Y., Monroe, C., O'Brien, J. L. Quantum computers. Nature. 464 (7285), 45-53 (2010).
- Monz, T., et al. Realization of a scalable Shor algorithm. Science. 351 (6277), 1068-1070 (2016).
- Debnath, S., Linke, N. M., Figgatt, C., Landsman, K. A., Wright, K., Monroe, C. Demonstration of a small programmable quantum computer with atomic qubits. Nature. 536 (7614), 63-66 (2016).
- Blatt, R., Roos, C. F. Quantum simulations with trapped ions. Nature Phys. 8 (4), 277-284 (2012).
- Kielpinski, D., Monroe, C., Wineland, D. J. Architecture for a large-scale ion-trap quantum computer. Nature. 417 (6890), 709-711 (2002).
- Moehring, D. L., et al. Design, fabrication and experimental demonstration of junction surface ion traps. New J Phys. 13 (7), 075018 (2011).
- Wright, K., et al. Reliable transport through a microfabricated X-junction surface-electrode ion trap. New J Phys. 15 (3), 033004 (2013).
- Amini, J. M., et al. Toward scalable ion traps for quantum information processing. New J Phys. 12 (3), 033031 (2010).
- Sterling, R. C., et al. Fabrication and operation of a two-dimensional ion-trap lattice on a high-voltage microchip. Nat Commun. 5, (2014).
- Kumph, M., et al. Operation of a planar-electrode ion-trap array with adjustable RF electrodes. New J Phys. 18 (2), 023047 (2016).
- Mielenz, M., et al. Arrays of individually controlled ions suitable for two-dimensional quantum simulations. Nat Commun. 7, (2016).
- Stick, D., Hensinger, W. K., Olmschenk, S., Madsen, M. J., Schwab, K., Monroe, C. Ion trap in a semiconductor chip. Nat Phys. 2 (1), 36-39 (2006).
- Harty, T. P., et al. High-fidelity preparation, gates, memory, and readout of a trapped-ion quantum bit. Phys Rev Lett. 113 (22), 220501 (2014).
- Cho, D., Hong, S., Lee, M., Kim, T. A review of silicon microfabricated ion traps for quantum information processing. Micro Nano Sys Lett. 3 (1), 1-12 (2015).
- Weidt, S., et al. Trapped-ion quantum logic with global radiation fields. Phys Rev Lett. 117 (22), 220501 (2016).
- Monroe, C., Kim, J. Scaling the ion trap quantum processor. Science. 339 (6124), 1164-1169 (2013).
- Brown, K. R., Kim, J., Monroe, C. Co-designing a scalable quantum computer with trapped atomic ions. npj Quantum Inf. 2, 16034 (2016).
- Lekitsch, B., et al. Blueprint for a microwave trapped-ion quantum computer. Science Adv. 3 (2), e1601540 (2017).
- Reichel, J., Vuletic, V. . Atom chips. , (2011).
- Ghosh, P. K., ed, ,. 1. s. t. . Ion Traps. , (1995).
- Wesenberg, J. H. Electrostatics of surface-electrode ion traps. Phys Rev A. 78 (6), 063410 (2008).
- House, M. G. Analytic model for electrostatic fields in surface-electrode ion traps. Phys Rev A. 78 (3), 033402 (2008).
- Hong, S., Lee, M., Cheon, H., Kim, T., Cho, D. I. Guidelines for Designing Surface Ion Traps Using the Boundary Element Method. Sensors. 16 (5), 616 (2016).
- Allcock, D. T. C., et al. Implementation of a symmetric surface-electrode ion trap with field compensation using a modulated Raman effect. New J Phys. 12 (5), 053026 (2010).
- Chiaverini, J., et al. Surface-electrode architecture for ion-trap quantum information processing. Quantum Inf Comput. 5 (6), 419-439 (2005).
- Allcock, D. T. C., et al. Heating rate and electrode charging measurements in a scalable, microfabricated, surface-electrode ion trap. Appl Phys B. 107 (4), 913-919 (2012).
- . Demonstration of a microfabricated surface electrode ion trap Available from: https://arxiv.org/abs/1008.0990 (2010)
- Allcock, D. T. C., et al. Reduction of heating rate in a microfabricated ion trap by pulsed-laser cleaning. New J Phys. 13 (12), 123023 (2011).
- Mount, E., et al. Single qubit manipulation in a microfabricated surface electrode ion trap. New J Phys. 15 (9), 093018 (2013).
- Siverns, J. D., Simkins, L. R., Weidt, S., Hensinger, W. K. On the application of radio frequency voltages to ion traps via helical resonators. Appl Phys B. 107 (4), 921-934 (2012).
- Kleinert, M., Dahl, M. E. G., Bergeson, S. Measurement of the Yb I 1S0−1P1 transition frequency at 399 nm using an optical frequency comb. Phys Rev A. 94 (5), 052511 (2016).
- Olmschenk, S., Younge, K. C., Moehring, D. L., Matsukevich, D. N., Maunz, P., Monroe, C. Manipulation and detection of a trapped Yb+ hyperfine qubit. Phys Rev A. 76 (5), 052314 (2007).
- Sansonetti, J. E., Martin, W. C., Young, S. L. . Handbook of Basic Atomic Spectroscopic Data. , (2013).
- Kern, W. . Thin film processes II. , (2012).
- Streed, E. W., Weinhold, T. J., Kielpinski, D. Frequency stabilization of an ultraviolet laser to ions in a discharge. Appl Phys Lett. 93 (7), 071103 (2008).
Reimpressões e Permissões
Solicitar permissão para reutilizar o texto ou figuras deste artigo JoVE
Solicitar PermissãoThis article has been published
Video Coming Soon
Copyright © 2025 MyJoVE Corporation. Todos os direitos reservados