Method Article
Fabrication de Diodes Schottky sur Zn-polar BeMgZnO/ZnO hétérostructure passé épitaxie de faisceau moléculaire assistée par Plasma
Dans cet article
Résumé
Réalisation des contacts de Schottky de haute qualité est impérative pour la réalisation de modulation porte efficace à hétérostructure transistors à effet de champ (HFETs). Nous présentons la méthodologie de fabrication et les caractéristiques des diodes Schottky sur Zn-polar BeMgZnO/ZnO hétérostructures avec gaz haute densité d’électrons dimensionnelle deux (2DEG), cultivés par épitaxie moléculaire assistée par plasma sur les modèles de GaN.
Résumé
Hétérostructure transistors à effet de champ (HFETs) utilisant un canal de gaz (2DEG) deux électrons dimensions ont un grand potentiel pour les applications à haute vitesse périphérique. Oxyde de zinc (ZnO), un semi-conducteur avec une large bande interdite (eV 3,4) et de la vitesse de saturation électronique élevée a gagné beaucoup d’attention comme un matériel attrayant pour les appareils haute vitesse. Modulation porte efficace, nécessite Toutefois, contacts de Schottky de haute qualité sur la couche barrière. Dans cet article, nous présentons notre procédure de fabrication de diode Schottky sur Zn-polar BeMgZnO/ZnO hétérostructure avec 2DEG haute densité qui est obtenue grâce à la modulation de la souche et l’incorporation de quelques pourcents être dans la barrière axée sur les MgZnO au cours de la croissance par épitaxie moléculaire (MBE). Pour atteindre la haute qualité cristalline, presque treillis assortie d’haute résistivité GaN modèles cultivés par dépôt chimique en phase vapeur métallo-organiques (MOCVD) sont utilisés comme substrat pour la croissance ultérieure de MBE des couches d’oxyde. Pour obtenir la condition Zn-polarité, traitement de surface prudent de GaN modèles et contrôle sur le rapport VI/II au cours de la croissance de couche de nucléation de ZnO à basse température sont utilisés. Électrodes de TI/Au servent de contacts ohmiques et électrodes Ag a déposé sur le plasma de2 O prétraitées BeMgZnO surface sont utilisés pour les contacts de Schottky.
Introduction
Hétérostructure transistors à effet de champ (HFETs) issus des deux gaz d’électrons dimensionnelle (2DEG) ont un potentiel prometteur pour les applications à grande vitesse des appareils électroniques1,2,3. Oxyde de zinc (ZnO) comme un semi-conducteur large bande interdite (eV 3,4) avec la vitesse de saturation électronique élevée a gagné une attention considérable comme une plate-forme pour HFETs4,5. Classiquement utilisé barrière matérielle MgZnO ternaire nécessitent une très forte teneur en Mg (> 40 %) cultivées au substrat faibles températures (300 ° C ou moins)6,7et ainsi ces structures sont susceptibles de se dégrader au titre des opérations de haute puissance et au cours de traitements thermiques, même si la densité de charge non désirée dans la barrière est suffisamment faible pour la modulation de la porte. Pour contourner cet obstacle, nous avons proposé et a BeMgZnO que la barrière, dans laquelle le signe de la souche dans la barrière peut être commuté de compression à la traction par l’intermédiaire de l’incorporation du béryllium (Be), rendant le spontané et le piezoelectricpolarizations à être additive. En conséquence, 2DEG haute concentration est possible avec la teneur en Mg relativement modérée. Utilisant cette approche, 2DEG haute densité est observée près de plasmons-LO résonance phonon (~ 7 × 1012 cm-2) en BeMgZnO/ZnO hétérostructures tandis que la teneur en Mg ci-dessous est de 30 % et l’être contenu n’est qu’à 2 ~ 3 %8.
En raison de ses semblables symétrie du cristal, UV et transparence de lumière visible, des propriétés physiques et chimiques robustes et faible coût, le plan c saphir est largement employé pour épitaxie de GaN et ZnO. Grâce aux progrès remarquables réalisés dans la technologie d’évolution de base de GaN électronique et les dispositifs optoélectroniques sur saphirs, modèles de GaN de haute qualité peuvent être produits facilement sur des substrats de saphir en utilisant AlN ou tampon de basse température (LT) GaN, malgré son incompatibilité de grand réseau de 16 % avec saphir9. Croissance épitaxiale de ZnO, qui a un décalage encore plus grand de treillis dans le plan de 18 % avec saphir, est relativement bien comprise pour la variété O-polaire, alors que la croissance de matériaux Zn-polaire en mode à deux dimensions n’est pas bien établie. En raison de la disparité de trellis modéré de 1,8 %, épitaxie de ZnO sur GaN est une alternative intéressante.
Les deux MOCVD et MBE sont les plus de succès techniques de déposition de semi-conducteur de fabrication de couches minces de haute qualité et hétérostructures avec une reproductibilité élevée. La principale raison pour laquelle MBE est moins populaire que MOCVD pour épitaxie de GaN est le coût et l’insuffisance de la production de masse. Le taux de croissance de GaN par MOCVD peut être plusieurs micromètres par heure et des dizaines de gaufrettes de diamètre de 2 pouces (50 mm) ou ceux aussi grande que 6-8" peut être cultivé dans une exécution9. Ici, nous avons aussi adopter MOCVD pour la croissance du GaN dans notre étude. Pour la croissance des hétérostructures à base de ZnO, cependant, davantage de rapports sur la formation du 2DEG est réalisées par MBE à l’heure actuelle avant la commercialisation du potentiel des applications10,11,12. Récemment, nous avons développé la croissance MBE d’hétérostructures ZnO haute qualité avec un contrôle précis de la polarité surface sur GaN Ga-polaire modèles13. Il a été constaté qu’avec un traitement pré-exposition Zn, ZnO couches donc cultivée Zn-polarité exposée lorsque nucléées avec faibles rapports VI/II (< 1,5), tandis que ceux nucléées avec des rapports de VI/II ci-dessus 1.5 exposé O polarité. Pour éviter le canal de conduction parallèle à l’aide de modèles de GaN, nous avons adopté carbone compensée semi-isolant GaN MOCVD cultivées dans des conditions de basse pression sur AlN tampon pour la croissance ultérieure des structures HFET axée sur le ZnO.
Avant notre travail14, il a eu aucun rapport sur l’enquête des diodes Schottky sur BeMgZnO/ZnO hétérostructures. Seulement plusieurs études ont rapporté sur les contacts de Schottky à MgZnO15,16, par exemple., avec un facteur d’idéalité de 2.37, une hauteur de la barrière de 0,73 eV et un ratio de rectification de seulement 103 15. Divers métaux Schottky ont été utilisés pour ZnO17, et parmi eux, argent (Ag) a été largement adopté, grâce à un relativement élevé Schottky barrière hauteur de 1,11 eV sur vrac ZnO avec un facteur d’idéalité de 1,08 18.
Dans ce travail, nous visons à fabriquer des diodes Schottky de haute qualité pour les applications dans les dispositifs à base de ZnO HFET à grande vitesse. Le protocole suivant s’applique spécifiquement à la fabrication de diodes Schottky Ag/BeMgZnO/ZnO par évaporation de faisceau électronique de Ag sur les BeMgZnO/ZnO hétérostructures cultivés par MBE assistée par plasma sur modèles déposés MOCVD GaN.
Protocole
1. croissance et préparation du modèle de GaN croissance MBE
- Croissance du modèle de GaN semi-isolant par MOCVD
- S’assurer que le robinet-vanne, isoler le charge-SAS du réacteur est fermée. Ventiler la charge-serrure avec N2 à la pression atmosphérique. Ouvrez la serrure-charge de sortir le porte-substrat.
- Le substrat de saphir de 2 pouces sur le support de charge et puis replacez le titulaire dans la serrure de charge. Pompe vers le bas de la pression de charge-serrure à 2,5 × 10-2 Torr par une pompe mécanique à sec.
- Ventiler la charge-serrure avec N2 pour égaliser la pression avec ça dans la chambre du réacteur (15 Torr).
- Ouvrir la vanne d’isolement de charge-lock et charger le titulaire dans l’assemblage du support échantillon dans le réacteur. Allumez le moteur de rotation et régler la vitesse de rotation du porte-substrat de 100 tr/min. Ensuite, fermez le robinet-vanne.
- Veiller à ce que l’eau de refroidissement est en cours d’exécution, les deux H2 NH3 alimentation est suffisante, débit masse de contrôleur (MFC) et lectures de pression contrôleur (PC) sont les mêmes que les valeurs de consigne et le porte-substrat est en train de tourner.
- Passer le gaz système du N2 H2. Mettez le moniteur de réflectance optique in situ .
- Initier la croissance en démarrant le fichier recette qui préinstalle tous les paramètres de croissance, notamment la montée en puissance du substrat températures, débits de gaz et pression de réacteur et l’utilisation de vannes.
- Montée de la pression de réacteur à 30 Torr en 3 min et la température du substrat à 1 055 ° C à désorber des contaminations résiduelles de la surface du substrat pendant 3 min dans environnement de2 H.
- Rampe de la température du substrat à 941 ° C pour la nucléation et la croissance de couche tampon de basse température (LT) AlN.
- Stabiliser le flux d’imine (Lamt) comme 12 standard centimètre cubique par minute (sccm) et ammoniac (NH3) flux sccm 7 et la température du substrat pendant 3 min.
- Initier la croissance de la couche de LT-AlN en passant Lamt des évents à la ligne de courir.
- Contrôler l’épaisseur de la couche de LT-AlN en utilisant un système de mesure de réflectivité sur mesure, qui comprend une diode laser 637 nm et un photodétecteur de Si p-i-n un logiciel Labview. Déterminer le taux de croissance de la période de réflectivité oscillations19,20. Dans les échantillons sélectionnés, utilisez transversales images de microscopie électronique balayage microscopie électronique et de transmission pour confirmer l’exactitude de la surveillance in situ .
- Garder la croissance pendant 6 min atteindre une épaisseur d’environ 20 nm, puis montée de la température du substrat à 1100 ° C en 3 min sans une interruption de la croissance et de poursuivre la croissance de l’AlN couche d’une épaisseur de 300 nm, sous la supervision de l’évolution de l’oscillation de la en s UIT réflectance optique.
- Passer Lamt d’exécuter au vent puis à ligne inactive pour arrêter la croissance de l’AlN. Stabiliser le flux de triméthylgallium (TMGa) à 15,5 sccm, montée en puissance l’écoulement de3 NH à 7000 sccm et stabiliser pendant 1 min. rampe jusqu'à la pression de réacteur à 76 Torr en 1 min. rampe jusqu'à la température du substrat à 1 107 ° C en 1 min.
- Nucléée et croître une couche de recouvrement GaN d’une épaisseur de ~ 400 nm, tout en surveillant l’évolution de réflectivité. Initialement, la réflectivité présente une forte baisse lorsque GaN Iles nuclée sur la surface de l’AlN et récupère ensuite l’intensité au niveau initiale correspondant à une surface plate atomiquement lorsque les îles fusionnent.
- Montée en puissance du substrat à 1124 ° C à 2 min. élevez la couche GaN semi-isolant de haute température avec une épaisseur de ~2.5 mm. arrêter la croissance en passant TMGa de courir au vent, puis au ralenti ligne.
- Refroidir le substrat à température ambiante sur une période de 40 min.
- Rampe vers le bas de la pression de réacteur à 15 Torr sur une période de 1,5 min.
- Décharger le substrat du réacteur en suivant la procédure inverse des étapes 1.1.1-1.1.4.
- GaN modèle préparation et chargement de réacteur MBE
- Découper le gabarit de GaN de 2 pouces en 6 morceaux égaux d’en forme de camembert à l’aide d’une pointe à tracer diamant.
- Préparer les régale solution acide à l’intérieur de la hotte acide en ajoutant l’acide nitrique (HNO3, 68,0-70,0 w/w%, 50 mL) à l’acide chlorhydrique (HCl, 36,5-38,0 w/w%, 150 mL) lentement dans un bécher de quartz.
- Placer le bécher d’eau régale sur une plaque chauffante avec une température de 220 ° C.
- Après l’apparition d’une couleur orange/rouge et les bulles de gaz, tremper un seul modèle de GaN en forme de Camembert dans la solution et la faire bouillir pendant 10 min.
- Rincer sous le robinet déminéralisée (DI) pendant 3 min, le modèle de GaN.
- Tremper le modèle GaN dans HCl (36,5-38,0 w/w%):H2O solution (1:1) pendant 3 min enlever l’oxyde Ga.
- Rincez le modèle GaN dans la gestion de l’eau distillée pendant 5 min.
- Sécher le modèle avec gaz2 N.
- Placez le nettoyé GaN sur un porte-Mo et chargez-le immédiatement en charge-écluse MBE.
- Recommencer à pomper vers le bas le verrou en charge par une pompe mécanique à sec.
2. MBE croissance des hétérostructures BeMgZnO/ZnO
- Préparation des cellules épanchement
- Après le pompage vers le bas de la poche charge pendant 1 h, commencer la préparation de la Zn, Mg, cellules d’effusion. Régler la température de la zone supérieure de la cellule de Zn double-zone à 525 ° C avec un taux de rampe de 17 ° C/min, attendre 5 min puis rampe jusqu'à 515 ° C avec un taux de rampe de 5 ° C/min. jeu de la température de cellule de Mg à 570 ° C avec un taux de rampe de 15 ° C/min , après avoir atteint le point de consigne, attendre 10 min puis rampe la cellule Mg jusqu'à 300 ° C. Définir l’être température cellule à 900 ° C, avec un taux de rampe de 10 ° C/min, après avoir atteint le point de consigne, attendez pendant 3 min puis rampe la cellule jusqu'à 650 ° C.
- Après 30 min, régler la température du bas de la cellule de Zn double-zone à 360 ° C avec un taux de rampe de 10 ° C/min.
- Après le pompage vers le bas de la charge-serrure pendant 2 h atteindre une pression de ~ 5 × 10-7 Torr, allumez le système de diffraction (RHEED) réflexion électrons à haute énergie et charger le modèle de GaN dans la chambre de MBE.
- Régler l’angle du gabarit GaN en tournant le manipulateur pour suivre l’évolution de modèle RHEED le long de la direction azimutale [1-100].
- Régler la température du bas de la cellule de Zn double-zone à 355 ° C avec un taux de rampe de 10 ° C/min.
- Contrôle de polarité de ZnO sur GaN et la croissance de LT-ZnO tampon
- Montée de la température du substrat à 615 ° C avec un taux de rampe de 13,6 ° C/min à désorber les contaminations résiduelles de la surface du substrat pendant 15 min.
- Rampe de la température de substrat de 615 à 280 ° C avec un taux de rampe de 13,6 ° C/min pour la croissance de LT-ZnO. Lorsque la température atteint 550 ° C, ouvrir l’obturateur de cellule de Zn pour exposer la surface du modèle GaN avec flux de Zn. Mettre en marche l’alimentation O2 plasma, régler la puissance de 100 W et cocher pour vérifier que la conduite de gaz2 O est fermé.
- Lorsque la température atteint 280 ° C, régler la puissance de plasma de2 O à 400 W, débit ensemble l’O2 à 0,3 sccm pour enflammer le plasma, puis diminuer la vitesse d’écoulement de2 O à 0,25 sccm.
- Attendre pendant 1 min, puis ouvrir l’obturateur de2 O pour démarrer la croissance de la couche tampon LT-ZnO.
- Enregistrer un modèle RHEED toutes les 5 min. Après avoir progressé pendant environ 15 min, correspondant à une épaisseur de tampon d’environ 20 nm, lorsque le modèle RHEED passe de rayures (mode 2D) à taches elliptiques (mode 3D), fermer les Zn et O2 trappes pour arrêter la croissance.
- La valeur du débit de2 O sccm 0,4 et régler la température de substrat à 730 ° C avec un taux de rampe de 13,6 ° C/min de recuire la couche tampon LT-ZnO. Régler la température du bas de la cellule de Zn double-zone à 345 ° C avec un taux de rampe de 10 ° C/min pour la croissance de la couche de HT-ZnO.
- Lorsque la température du substrat a atteint le point de consigne de 730 ° C, attendre 5 min et vérifier la surface de ZnO par RHEED. Lorsque le modèle RHEED transite de la 3D à la 2D, cesser de recuit par rampe vers le bas de la température du substrat à 700 ° C.
- Croissance de la couche de ZnO haute température
- Lorsque la température du substrat atteint 700 ° C et se stabilise, augmenter le débit de2 de O à 3,2 sccm.
- Démarrer la croissance de la couche de HT-ZnO en ouvrant les Zn et O2 volets simultanément.
- Développer la couche HT-ZnO pour ~ 140 min pour atteindre une épaisseur d’environ 300 nm. Enregistrer les patrons RHEED plusieurs fois au cours de la croissance pour confirmer le mode de croissance 2D.
- Arrêter la croissance de la couche de HT-ZnO en fermant les Zn et O2 volets simultanément.
- Croissance de barrière BeMgZnO
- La valeur du débit de2 O 0,3 sccm, définissez la température des cellules à 820 ° C avec un taux de rampe de 10 ° C/min, régler la température de cellule de Mg à 510 ° C avec un taux de rampe de 15 ° C/min et régler la température de substrat à 325 ° C avec un taux de rampe de 13,6 ° C/min pour la croissance de la barrière BeMgZnO.
- Lorsque la température du substrat se stabilise, augmenter le débit de2 O à 1,25 sccm, et d’abord la croissance simultanée ouvrant le Zn, Mg, être et O2 volets.
- Cultiver la couche barrière de BeMgZnO pour environ 12 min pour atteindre une épaisseur d’environ 30 nm. Record RHEED modèles plusieurs fois au cours de la croissance pour surveiller l’évolution de mode de croissance.
- Arrêter la croissance de la couche BeMgZnO en fermant le Mg et être le déclencheur, tout en gardant le Zn et O2 obturateur ouvert pendant 1 min avoir une couche de cap de ZnO épaisse ~ 2 nm.
- Fini la croissance en fermant les volets2 fois Zn et O.
- Rampe de la température du substrat à sa température de veille 150 ° C. Diminuer la vitesse d’écoulement de2 O à 0,25 sccm.
- Lorsque la température du substrat est inférieure à 250 ° C, diminuer la puissance de plasma de2 O à 100 W, couper O2 plasma alimentation, diminuer la vitesse d’écoulement de O2 à 0, fermer la ligne de gaz de2 O et refroidir la température de cellule de veille conditions.
- Attendez que la température du substrat atteindre 150 ° C, la température de veille, ouvrez la vanne de la chambre de croissance et décharger le titulaire de la plaquette pour le charge-SAS.
- Aérer la chambre de charge-serrure avec gaz2 N et retirer l’échantillon.
3. caractérisations
- À peu près, mesurer l’épaisseur de l’échantillon en utilisant une étape-profiler, par le biais de la zone couverte sur le bord de l’échantillon.
- Évaluer la qualité d’épaisseur, souche et structural de l’hétérostructure en utilisant la diffraction des rayons x (HRXRD) (2 q-w scans de réflexion (0002)) de haute résolution.
- Couper l’échantillon en 5 × 5 mm2 morceau carré à l’aide d’une pointe à tracer diamant. Étudier les propriétés électroniques de l’échantillon en utilisant des mesures de température dépendants effet Hall dans la géométrie van der Pauw, indium (In) points comme électrodes de contact.
- Vérifier la morphologie de la surface à l’aide de la microscopie à force atomique (AFM).
4. fabrication des Diodes Schottky
- Fabrication de contacts ohmiques sur BeMgZnO/ZnO hétérostructures
- Dégraisser l’échantillon (~ 20 × 20 mm2 en taille) avec de l’acétone dans un nettoyeur à ultrasons pendant 5 min, suivie de nettoyage avec du méthanol dans le nettoyeur à ultrasons pendant 5 min, rincer à l’eau distillée pendant 5 min et soufflant sèche avec N2.
- Tourner la couche photosensible avec 1000 tr/min pour 3 s et puis 3000 tr/min pendant 30 s.
- Doux, faire cuire la résine photosensible à 100 ° C pendant 140 s.
- Exposer avec la lumière à travers le contact ohmique UV masque à 6,5 mW UV lampe la puissance min 2,38 sur aligneur de masque de photolithographie.
- Post cuire la résine photosensible à 110 ° C pendant 80 s.
- Développer dans un développeur pour 60 s avec une fréquence de secouage de 1/s.
- Rincer à l’eau distillée pendant 3 min et séchez-la avec N2.
- Charger l’échantillon dans l’évaporateur de faisceau d’électrons.
- Sans chauffage de l’échantillon, déposer Ti/UA avec une épaisseur de 30/50 nm, telle que mesurée par le moniteur d’épaisseur de cristal de quartz.
- Je décolle dans l’acétone, puis nettoyer dans le méthanol pendant 5 min, rincer à l’eau distillée pendant 5 min et soufflant sèche N2.
- Recuire le contact par recuit thermique rapide (RTA) à 300 ° C pendant 30 s.
- Vérifier la résistance de contact par l’intermédiaire de transition ligne modèle (TLM) mesure21.
- Fabrication de Schottky contacts sur BeMgZnO/ZnO hétérostructures
- Suivez les étapes 4.1.1-4.1.7 pour photolithographie de contact Schottky.
- Traiter la surface de l’échantillon avec remote plasma de2 O pendant 5 min avec un débit de2 O de 35 sccm et une puissance de RF de 50 w.
- Suivez les étapes 4.1.8-4.1.10 pour le dépôt d’Ag d’une épaisseur de 50 nm.
- Caractériser la structure obtenue par des mesures I-V pour les diodes de Schottky17.
Résultats
La colonne de gauche de la Figure 1 montre l’évolution du modèle RHEED enregistré le long de la direction azimutale [1-100] durant la croissance MBE d’un être0,02Mg0,26ZnO/ZnO hétérostructure avec une HT-ZnO épaisse 300 nm et un 30 nm d’épaisseur se0,02 Barrière de ZnO0,26Mg. La colonne de droite affiche des morphologies surfaces représentatives aux stades de croissance différents (pas à partir du même échantillon). Comme en témoignent de l’apparition d’un modèle RHEED inégale, la couche tampon LT-ZnO est de nature de mode croissance tridimensionnelle (3D) de l’île. Sa morphologie de la surface a été améliorée par un traitement thermique recuit à une température supérieure à 700 ° C. On voit clairement que la surface transforme en 3D morphologie 2D. La couche de HT-ZnO ultérieure ne cesse de croître en mode 2D, suivie de la croissance 2D d’y avoir0,02Mg0,26ZnO couche sans la formation d’une deuxième phase. Mesures de l’AFM ont montré que le modèle de GaN a une rugosité moyenne quadratique (RMS) de 0,28 nm pour le 5 × 5 μm2 scan. Une surface lisse avec une rugosité RMS de 0,35 nm est obtenu pour la couche de HT-ZnO sans barrière en poussant sous condition O riche et une rugosité RMS de 0,45 nm est observée après la croissance de la barrière BeMgZnO.
HRXRD triple-axe 2θ-ω scan pour une typique Zn-polaire être0,02Mg0,26ZnO/ZnO hétérostructure avec une HT-ZnO épaisse 300 nm et de 50 nm d’épaisseur être0,02Mg0,26ZnO couche barrière est illustré à la Figure 2. Les réflexions à 34,46 o34.54 oet 34.75 o concordent avec des reflets (0002) de ZnO, GaN et0,02Mg0,26ZnO, respectivement. Notez que l’élargissement de la réflexion du être0,02Mg0,26ZnO est due à sa minceur. La déformation en traction biaxiale dans la couche de ZnO est une indication de l’hétérostructure Zn-polaire, tel qu’étudié dans notre précédente étude13. Être et contenu de Mg dans le Quaternaire BeMgZnO ont été calculés sous l’angle de Bragg de son énergie du photon XRD (0002) réflexion et émission en LT-photoluminescence (PL-LT) spectre mesuré à 13 K (non illustré).
La figure 3 montre les résultats des mesures à effet Hall dépendant de la température pour un être0,02Mg0,26ZnO/ZnO hétérostructure. La concentration de porteurs de feuille réduite de 8,8 × 1012 cm-2 à 6,4 × 1012 cm-2 lorsque l’échantillon a été refroidi à environ 100 K. depuis la température ambiante (293 K) Avec refroidissement à 13 K, la concentration de porteurs de feuille sature à 6,2 × 1012 cm-2. Cette constatation se manifeste que la réduction observée de la concentration des électrons est originaire de la contribution des voies de conduction parallèle incluent la couche de nucléation défectueux et HT-ZnO couche ainsi que les être0,02Mg0,26ZnO barrière, le cas échéant. Cette tendance a également été signalée pour MgZnO/ZnO hétérostructures10,22. La mobilité des électrons dans l’être de0,02Mg0,26ZnO/ZnO hétérostructure monotone augmente avec la température ; tant la 293 K de 206 cm2/Vs la mobilité et 13 K de 1550 cm2/Vs sont comparables aux valeurs dans la littérature22,23. L’évolution des propriétés électroniques en fonction de la température indique clairement la présence du 2DEG à l’être de0,02Mg0,26ZnO/ZnO heterointerface.
La figure 4 illustre la courant-tension (I-V) courbes mesurées à température ambiante pendant quatre représentant Ag / Be0,02Mg0,26ZnO/ZnO Schottky diodes avec une superficie de Schottky de 1,1 × 10-4 cm2 dans une plaquette. Les courants avant augmentent exponentiellement avec la tension appliquée jusqu'à 0,25 V, au-delà de laquelle la tension tombe à travers la résistance de série devenue apparente. La hauteur maximale de barrière de Schottky de Φap de 1,07 eV a été atteint par un n de facteur d’idéalité de 1,22. Les ratios de rectification d’environ 1 × 108 sont obtenus en utilisant les valeurs actuelles mesurées à V= ±2 V.
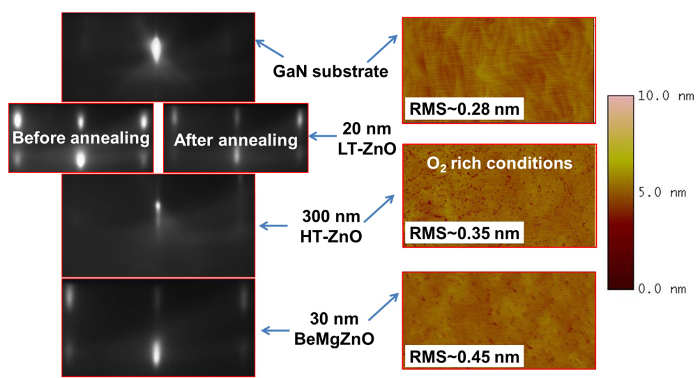
Figure 1. Caractérisation de la surface. Colonne de gauche affiche les modèles RHEED prises le long de la direction azimutale [1-100] durant la croissance MBE d’une hétérostructure de ZnO/ZnO0,02Mg0,26et colonne de droite présente les morphologies surfaces du modèle GaN, HT-ZnO couche et être 0,02couche de ZnO0,26Mg mesuré par l’AFM. LT-ZnO tampon technologie permet la croissance 2D-mode d’hétérostructures ZnO haute qualité sur les modèles de GaN faibles treillis-incompatibles. S’il vous plaît cliquez ici pour visionner une version agrandie de cette figure.
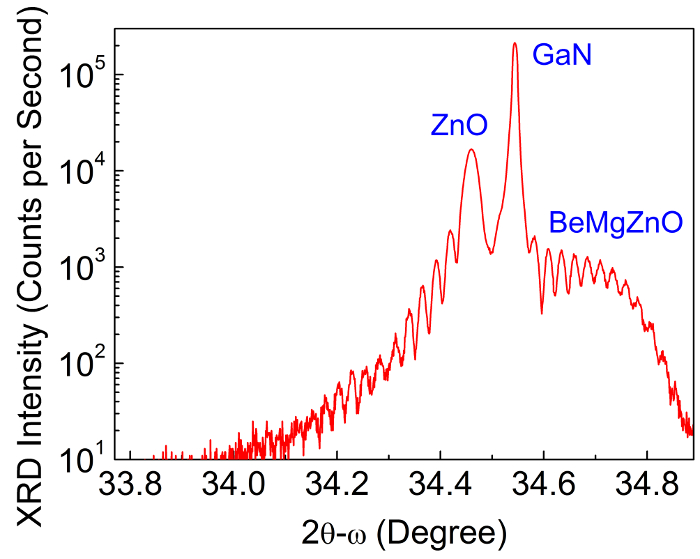
Figure 2. HRXRD de l’hétérostructure. HRXRD triple-axe 2θ-ω scan d’un typique Zn-polaire être0,02Mg0,26ZnO/ZnO hétérostructure 50 nm d’épaisseur être0,02Mg0,26couche barrière ZnO. Les réflexions à 34,46 o34.54 oet 34.75 o concordent avec des reflets (0002) de ZnO, GaN et0,02Mg0,26ZnO, respectivement. S’il vous plaît cliquez ici pour visionner une version agrandie de cette figure.
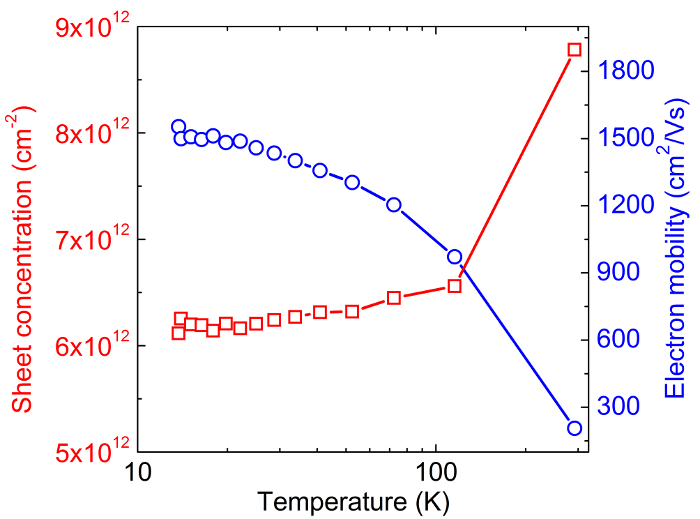
Figure 3. Propriétés électroniques de l’hétérostructure. Dépendances température de mobilité de densité et de l’électron de transporteur feuille de Zn-polaire être0,02Mg0,26ZnO/ZnO hétérostructure. S’il vous plaît cliquez ici pour visionner une version agrandie de cette figure.

Figure 4. Diodes Schottky. Caractéristiques typiques I-V de quatre représentant Ag / diodes de Schottky de ZnO/ZnO0,02Mg0,26mesurée à température ambiante. La similitude des courbes I-V quatre indique la grande uniformité dans la plaquette de l’échantillon. S’il vous plaît cliquez ici pour visionner une version agrandie de cette figure.
Discussion
Incorporation de BeO MgZnO pour former le Quaternaire BeMgZnO offre la possibilité de régler l’étendue et le signe de la souche dans le Quaternaire et donc augmente de manière significative la 2DEG densité8. Les résultats représentatifs montrent que l’être de0,02Mg de0,26ZnO/ZnO hétérostructure entraîne une densité 2DEG proche de plasmons désiré-LO phonon résonance électronique densité (environ 7 × 1012 cm-2)24. Bien que la mobilité des électrons de l’hétérostructure dépend fortement des paramètres de croissance MBE tels que la température du substrat et le rapport VI/II de la HT-ZnO et la barrière de BeMgZnO, la densité de 2DEG est faiblement dépendantes sur les conditions de croissance et déterminée principalement par l’être et le contenu de Mg dans la barrière.
Un modèle de GaN est utilisé pour la croissance des hétérostructures BeMgZnO/ZnO avec haute qualité cristalline en raison de la disparité de trellis modéré de 1,8 % entre GaN et ZnO, comparée à une incompatibilité de grand réseau de 18 % entre saphir et ZnO. Pour éviter n’importe quel canal parallèle conductrice, il est essentiel de disposer d’une forte résistance dans la gamme carré/MΩ pour le modèle de GaN. Dans notre cas, cela s’effectue de plus en plus à une faible pression de 76 Torr afin d’améliorer la compensation carbone. Afin d’assurer le contrôle de polarité dans les hétérostructures BeMgZnO/ZnO (Zn-polarité), attention traitement de surface de modèle de GaN est indispensable. Toute oxydation ou la contamination a présenté lors de la préparation sur la surface de GaN induirait Zn - et O-mix-polarité dans les hétérostructures même le ratio déterminant de VI/II < 1.5 est remplie.
Toute réaction chimique entre le métal et les semi-conducteurs, la présence de contaminants de surface, déclare, défauts dans le voisinage de la surface et la diffusion du métal dans les semi-conducteurs sont des problèmes communs dans le domaine de la fabrication de Schottky contacts. Une variété de méthodes a été signalée dans la littérature pour la préparation de la surface de ZnO pour fabrication contact Schottky. Parmi eux se trouvent gravure gravure dans HCl (ou d’autres acides), physique avec Ar+, Ozone UV, nettoyage, traitement en H2O2et O2 plasma (ou mélange avec He)25,26,27, 28. les procédures de gravure visent la suppression d’une couche d’épaisseur une allant de quelques nanomètres à microns et par conséquent ne peut être appliquées pour les appareils HFET. Les UV-Ozone nettoyage ou procédure de plasma O2 supprime uniquement la couche de surface. Par conséquent, il est bien adapté pour la préparation de la surface de notre hétérostructures BeMgZnO/ZnO.
Habituellement les contacts Schottky sont réalisés en déposant un métal haute fonction de travail tel que le Pd, Pt, Ir, etc.. En revanche, Ag possède une fonction de travail faible de 4,26 eV. Malgré cela, dispositifs utilisant des électrodes Ag peuvent montrer rectification de comportement en raison de la formation d’une couche d’oxyde argent interface causée par l’oxydation partielle des Ag avec l’oxygène de matrice de ZnO. La couche d’oxyde ainsi formée est transparente pour les électrons et a la fonction de travail plus élevée par rapport à l’Ag. Raju et al. ont rapporté des fonctions de travail autour de 5,5 eV pour AgO cultivé par les dépôts de laser pulsé (PLD), qui est de 1,3 eV supérieure à celle de l’Ag et à proximité de la caractéristique de Pd, Pt et Ir29. Nos résultats indiquent que cette électrode Ag (avec O2 plasma prétraitement sur la surface de l’hétérostructure ZnO) est un métal contact prometteur pour la formation des diodes Schottky.
Nous avons démontré un procédé pour fabriquer des contacts de Schottky de haute qualité pour HFETs à base de ZnO. Modèle de GaN MOCVD cultivé avec une préparation minutieuse surface juste avant la croissance MBE et un faible ratio de VI/II < 1,5 au cours de la nucléation de ZnO assurer l’orientation Zn-polaire de l’hétérostructures ZnO-basé de haute qualité. MOCVD est une technique mature largement utilisé pour l’épitaxie de GaN pour diverses applications. La procédure MBE décrite dans cet ouvrage indique les combinaisons de techniques MOCVD et MBE et semi-conducteurs GaN et oxyde pour appareils électroniques. Incorporation d’une petite quantité d’être dans les résultats BeMgZnO de couche barrière en HFETs avec 2DEG haute densité, mobilité des électrons haute et haute stabilité thermique, pour un meilleur rendement de haute vitesse.
Déclarations de divulgation
Les auteurs n’ont rien à divulguer.
Remerciements
Ce travail a été soutenu par la Force aérienne Bureau du scientifique recherche (AFOSR) sous Grant FA9550-12-1-0094.
matériels
| Name | Company | Catalog Number | Comments |
| MOCVD | Emcore | custom-built | |
| MBE | SVT Associates | ||
| TMAl | SAFC | CAS: 75-24-1 | |
| TMGa | SAFC | CAS: 1445-79-0 | |
| NH3 | The Linde group | CAS: 7664-41-7 | |
| H2 | National Welders Supply Co. | supplier part no. 335-041 | Grade 5.0 |
| O2 | National Welders Supply Co. | supplier part no. OX 300 | Industrial Grade Oxygen, Size 300 Cylinder, CGA-540 |
| Mg | Sigma-Aldrich | Product No.: 474754-25G | MAGNESIUM, DISTILLED, DENDRITIC PIECES, 99.998% METALS BASIS |
| Be | ESPI Metals | Stock No. K646b | Beryllium pieces, 3N |
| Zn | Alfa Aesar, Thermo Fisher Scientific Chemicals Inc. | Product No.: 10760-30 | Zinc shot, 1-6mm (0.04-0.24in), Puratronic, 99.9999% |
| Au | Kurt J. Lesker | part no. EVMAUXX40G | Gold Pellets, 99.99% |
| Ag | Kurt J. Lesker | part no. EVMAG40QXQ | Silver Pellets, 99.99% |
| Ti | Kurt J. Lesker | part no. EVMTI45QXQ | Titanium Pellets, 99.995% |
| Developer | Rohm and Haas electronic Materials LLC | MF-CD-26 | Material number 10018050 |
| Photoresist | Rohm and Haas electronic Materials LLC | SPR 955 | Material number 10018283 |
Références
- Morkoc, H., Solomon, P. M. The hemt: A superfast transistor: An experimental GaAs-AlGoAs device switches in picoseconds and generates little heat. This is just what supercomputers need. IEEE spectrum. 21 (2), 28-35 (1984).
- Aktas, O., et al. Microwave performance of AlGaN/GaN inverted MODFET's. IEEE Electron Device Letters. 18 (6), 293-295 (1997).
- Leach, J. H., et al. Effect of hot phonon lifetime on electron velocity in InAlN/AlN/GaN heterostructure field effect transistors on bulk GaN substrates. Applied Physics Letters. 96 (13), 133505 (2010).
- Sasa, S., et al. Microwave performance of ZnO/ZnMgO heterostructure field effect transistors. Physica status solidi (a). 208 (2), 449-452 (2011).
- Ye, D., et al. Enhancement-mode ZnO/Mg0.5Zn0.5O HFET on Si. Journal of Physics D: Applied Physics. 47 (25), 255101 (2014).
- Koike, K., et al. Molecular beam epitaxial growth of wide bandgap ZnMgO alloy films on (111)-oriented Si substrate toward UV-detector applications. Journal of Crystal Growth. 278 (1-4), 288-292 (2005).
- Du, X., et al. Controlled Growth of High-Quality ZnO-Based Films and Fabrication of Visible-Blind and Solar-Blind Ultra-Violet Detectors. Advanced Materials. 21 (45), 4625-4630 (2009).
- Ding, K., Ullah, M., Avrutin, V., Özgür, &. #. 2. 2. 0. ;., Morkoç, H. Investigation of high density two-dimensional electron gas in Zn-polar BeMgZnO/ZnO heterostructures. Applied Physics Letters. 111 (18), 182101 (2017).
- Ding, K., Avrutin, V., Özgür, &. #. 2. 2. 0. ;., Morkoç, H. III-Nitride Light-Emitting Diodes. Wiley Encyclopedia of Electrical and Electronics Engineering. , 1-21 (2017).
- Tsukazaki, A., et al. Quantum Hall effect in polar oxide heterostructures. Science. 315 (5817), 1388-1391 (2007).
- Tsukazaki, A., et al. Observation of the fractional quantum Hall effect in an oxide. Nat Mater. 9 (11), 889-893 (2010).
- Falson, J., et al. MgZnO/ZnO heterostructures with electron mobility exceeding 1 x 10(6) cm(2)/Vs. Sci Rep. 6, 26598 (2016).
- Ullah, M. B., et al. Polarity control and residual strain in ZnO epilayers grown by molecular beam epitaxy on (0001) GaN/sapphire. physica status solidi (RRL) Rapid Research Letters. 10 (9), 682-686 (2016).
- Ullah, M. B., et al. Characterization of Ag Schottky Barriers on Be0.02Mg0.26ZnO/ZnO Heterostructures. physica status solidi (RRL) - Rapid Research Letters. , (2017).
- Lee, J. H., et al. Schottky diodes prepared with Ag, Au, or Pd contacts on a MgZnO/ZnO heterostructure. Japanese Journal of Applied Physics. 51 (9S2), 09MF07 (2012).
- Singh, R., et al. Investigation of barrier inhomogeneities and interface state density in Au/MgZnO: Ga Schottky contact. Journal of Physics D: Applied Physics. 49 (44), 445303 (2016).
- Brillson, L. J., Lu, Y. ZnO Schottky barriers and Ohmic contacts. Journal of Applied Physics. 109 (12), 121301 (2011).
- Müller, S., et al. Method of choice for fabrication of high-quality ZnO-based Schottky diodes. Journal of Applied Physics. 116 (19), 194506 (1945).
- Figge, S., Böttcher, T., Einfeldt, S., Hommel, D. In situ and ex situ evaluation of the film coalescence for GaN growth on GaN nucleation layers. Journal of Crystal Growth. 221 (1-4), 262-266 (2000).
- Han, J., Ng, T. -. B., Biefeld, R., Crawford, M., Follstaedt, D. The effect of H 2 on morphology evolution during GaN metalorganic chemical vapor deposition. Applied Physics Letters. 71 (21), 3114-3116 (1997).
- Berger, H. Models for contacts to planar devices. Solid-State Electronics. 15 (2), 145-158 (1972).
- Tampo, H., et al. Polarization-induced two-dimensional electron gases in ZnMgO/ZnO heterostructures. Applied Physics Letters. 93 (20), 202104 (2008).
- Ye, J. D., et al. Two-dimensional electron gas in Zn-polar ZnMgO/ZnO heterostructure grown by metal-organic vapor phase epitaxy. Applied Physics Letters. 97 (11), 111908 (2010).
- Šermukšnis, E., et al. Hot-electron energy relaxation time in Ga-doped ZnO films. Journal of Applied Physics. 117 (6), 065704 (2015).
- Singh, C., Agarwal, G., Rao, G. D., Chaudhary, S., Singh, R. Effect of hydrogen peroxide treatment on the electrical characteristics of Au/ZnO epitaxial Schottky diode. Materials Science in Semiconductor Processing. 14 (1), 1-4 (2011).
- Mohanta, S., et al. Electrical characterization of Schottky contacts to n-MgZnO films. Thin Solid Films. 548, 539-545 (2013).
- Schifano, R., Monakhov, E., Grossner, U., Svensson, B. Electrical characteristics of palladium Schottky contacts to hydrogen peroxide treated hydrothermally grown ZnO. Applied Physics Letters. 91 (19), 193507 (2007).
- Ip, K., et al. Improved Pt/Au and W/Pt/Au Schottky contacts on n-type ZnO using ozone cleaning. Applied Physics Letters. 84 (25), 5133-5135 (2004).
- Raju, N. R. C., Kumar, K. J., Subrahmanyam, A. Physical properties of silver oxide thin films by pulsed laser deposition: effect of oxygen pressure during growth. Journal of Physics D: Applied Physics. 42 (13), 135411 (2009).
Réimpressions et Autorisations
Demande d’autorisation pour utiliser le texte ou les figures de cet article JoVE
Demande d’autorisationThis article has been published
Video Coming Soon