Method Article
Rendu SiO2/Si Surfaces omniphobes en sculptant des microtextures à gaz comprenant des cavités ou des piliers réentrants
Dans cet article
Résumé
Ce travail présente des protocoles de microfabrication pour la réalisation de cavités et de piliers avec des profils de reentrant et doublement réentrants sur les plaquettes SiO2/Si utilisant la photolithographie et la gravure sèche. Les surfaces microtexturées résultantes démontrent la répulsivité liquide remarquable, caractérisée par le piégeage à long terme robuste de l’air sous les liquides mouillants, en dépit de la wettability intrinsèque de la silice.
Résumé
Nous présentons des protocoles de microfabrication pour rendre les matériaux intrinsèquement mouillants répulsifs aux liquides (omniphobes) en créant des microtextures de gaz (GEM) sur eux comprenant des cavités et des piliers avec des caractéristiques de réentrant et doublement réentrant. Plus précisément, nous utilisons SiO2/Si comme système modèle et partageons des protocoles pour la conception bidimensionnelle (2D), la photolithographie, les techniques de gravure isotropique/anisotropique, la croissance de l’oxyde thermique, le nettoyage du piranha et le stockage vers la réalisation de ces microtextures. Même si la sagesse conventionnelle indique que le durcissement intrinsèquedes des surfaces mouillantes(o 'lt; 90 ') les rend encore plus mouillantes('r 'lt; 'o 'lt; 90 '), les GEM démontrent la répulsivité liquide malgré la mouillabilité intrinsèque du substrat. Par exemple, en dépit de l’amabilité intrinsèque de la silice o 40 pour le système d’eau/air, etde l’o à 20 degrés pour le système hexadecane/air, les GEM comprenant des cavités piègent l’air solidement lors de l’immersion dans ces liquides, et les angles de contact apparents pour les gouttelettes sont de 90euros. Les caractéristiques de réentrant et doublement reentrantdansles stabilisent le ménisque liquide intrus, piégeant ainsi le système liquide-solide-vapeur dans des états métastatiques remplis d’air (États de Cassie) et retardant les transitions de mouillage à l’état thermodynamique-stable entièrement rempli (état de Wenzel) par, par exemple, des heures à des mois. De même, les surfaces SiO2/Si avec des rangées de micropillars de reentrant et doublement réentrants démontrent des angles de contact extrêmement élevés(rà 150 '160 ') et une hystérèse à angle de contact faible pour les liquides de la sonde, ainsi caractérisés comme superomniphobes. Cependant, lors de l’immersion dans les mêmes liquides, ces surfaces perdent considérablement leur superomniphobicité et sont entièrement remplies au sein de l’indice 1. Pour relever ce défi, nous présentons des protocoles pour les conceptions hybrides qui comprennent des rangées de piliers doublement réentrants entourés de murs avec des profils doublement entrants. En effet, les microtextures hybrides piègent l’air lors de l’immersion dans les liquides de la sonde. En résumé, les protocoles décrits ici devraient permettre d’enquêter sur les GEM dans le contexte de la réalisation de l’omniphobicité sans revêtements chimiques, tels que les perfluorocarbures, qui pourraient débloquer la portée des matériaux communs peu coûteux pour les applications comme matériaux omniphobes. Les microtextures de silice pourraient également servir de modèles pour les matériaux mous.
Introduction
Les surfaces solides qui présentent des angles de contact apparents, sont appelées omniphobes1. Ces surfaces servent de nombreuses applications pratiques, y compris le dessalement de l’eau2,3, séparation huile-eau4,5, antibiofouling6, et la réduction de la traînée hydrodynamique7. Typiquement, l’omniphobicité nécessite des produits chimiques perfluorés et des topographies aléatoires8,9,10,11,12. Cependant, le coût, la non-biodégradabilité et la vulnérabilité de ces matériaux/revêtements posent une myriade de contraintes, par exemple, les membranes de dessalement perfluorées se dégradent à mesure que les températures du côté de l’alimentation sont augmentées, ce qui conduit à l’humidification des pores13,14, et les revêtements perfluorinés/hydrocarbures sont également abrasés15,16 et dégradés par les particules de silt dans les flux et les protocoles de nettoyage. Il est donc nécessaire d’adopter d’autres stratégies pour atteindre les fonctions des revêtements perfluorés (c.-à-d. attacher l’air à l’immersion dans les liquides sans utiliser de revêtements hydrofuges). Par conséquent, les chercheurs ont proposé des topographies de surface composées de surplomb (reentrant) caractéristiques qui pourraient piéger l’air sur l’immersion par microtextturing seul17,18,19,20,21,22,23,24,25. Ces microtextures se présentent en trois types : cavités26, piliers27, et tapis fibreux8. Par la suite, nous nous référerons aux caractéristiques de réentrant avec des surplombs simples comme reentrant(Figure 1A-B et Figure 1E-F) et aux caractéristiques de réentrant avec des surplombs qui font un virage de 90 degrés vers la base en tant que doublement réentrant(Figure 1C-D et Figure 1G-H).
Dans leurs travaux pionniers, Werner et coll.22,28,29,30,31 caractérissées de queues de printemps (Collembola), arthropodes vivant dans le sol, et ont expliqué l’importance des caractéristiques en forme de champignon (reentrant) dans le contexte du mouillage. D’autres ont également étudié le rôle des poils en forme de champignon chez les patineurs de mer32,33 pour faciliter la répulsif extrême de l’eau. Werner et ses collègues ont démontré l’omniphobicité des surfaces polymères intrinsèquement mouillantes en sculptant des structures biomimétiques grâce à la lithographie à empreinte inversée29. Liu et Kim ont fait rapport sur des surfaces de silice ornées de rangées de piliers doublement réentrants qui pouvaient repousser les gouttes de liquides avec des tensions de surface aussi basses que leLV à 10 mN/m, caractérisée par des angles de contact apparents, 150 et une hystérèse à angle de contact extrêmement faible27. Inspirés par ces développements étonnants, nous avons suivi les recettes de Liu et Kim pour reproduire leurs résultats. Cependant, nous avons découvert que ces microtextures perdraient de façon catastrophique leur superomniphobicité, c’est-à-dire si les gouttes liquides mouillante touchaient le bord de la microtexture ou s’il y avait des dommages physiques localisés34. Ces résultats ont démontré que les microtextures à base de piliers étaient impropres aux applications qui nécessitaient l’omniphobicité en immersion, et ils ont également remis en question les critères d’évaluation de l’omniphobicité (c.-à-d. qu’ils se limitent aux angles de contact seuls, ou si des critères supplémentaires sont nécessaires).
En réponse, à l’aide des plaquettes SiO2/Si, nous avons préparé des rangées de cavités à microéchelle avec des entrées doublement rétractées et, en utilisant l’eau et l’hexadecane comme liquides polaires et non polaires représentatifs, nous avons démontré que (i) ces microtextures empêchent les liquides d’y entrer en piégeant l’air, et (ii) l’architecture compartimentée des cavités empêche la perte de l’air emprisonné par des défauts localisés34. Ainsi, nous avons appelé ces microtextures comme des « microtextures de gaz »). Comme prochaine étape, nous avons microfabriqué GEMs avec des formes variables (circulaire, carré, hexagonale) et les profils (simple, réentrant, et doublement réentrant) pour comparer systématiquement leurs performances en immersion dans les liquides mouillants26. Nous avons également créé une microtexture hybride comprenant des rangées de piliers doublement entrants entourés de murs avec des profils doublement entrants, ce qui empêchait les liquides de toucher les tiges des piliers et l’air solidement emprisonné sur l’immersion35. Ci-dessous, nous présentons des protocoles détaillés pour la fabrication de GEM sur les surfaces SiO2/Si grâce à la photolithographie et aux techniques de gravure ainsi qu’à des paramètres de conception. Nous présentons également des résultats représentatifs de la caractérisation de leur mouillage par goniométrie d’angle de contact (avance/recul/angles placés) et de l’immersion dans l’hexadecane et l’eau.
Protocole
REMARQUE : Des réseaux de cavités et de piliers réentrants et doublement réentrants ont été microfabriqués en adaptant le protocole en plusieurs étapes pour les piliers rapportés par Liu et Kim27. Des précautions ont été prises pour minimiser la formation de résidus d’épingles ou de particules sur nos surfaces qui pourraient interférer avec les transitions de mouillage36.
MICROFABRICATION DE CAVITÉS
D’une manière générale, les protocoles pour la microfabrication des cavités de reentrant et doublement réentrantes (RCs et CRC) se composent de la conception bidimensionnelle de disposition, de la photolithographie, de la gravure générale de silice, et de la gravure spécifique de silicium, selon la caractéristique finaleexigée 37,38,39,40,41.
1. Conception
- Démarrer le processus de microfabrication en concevant le modèle requis dans un logiciel de mise en page42. Un exemple d’un tel logiciel est répertorié dans la Liste des Matériaux.
- À l’aide du logiciel, créez un nouveau fichier. Dessinez une cellule d’unité comprenant un cercle de diamètre, D 200 m. Copier et coller ce cercle avec une distance centre-centre (pitch) de L 212 m pour créer un tableau de cercles dans une parcelle carrée de la zone 1 cm2 (Figure 2).
- Dessinez un cercle de diamètre de 100 mm (4 pouces). Placez le tableau carré de 1 cm2 à l’intérieur du cercle et reproduisez-le pour créer une grille de 4 x 4 de tableaux carrés. Les entités à l’intérieur du cercle seront transférées sur les plaquettes de 4 pouces (Figure 2).
- Exporter le fichier de conception vers le format désiré pour le système d’écriture de masque (p. ex., le format GDSII).
2. Nettoyage des gaufrettes
- Nettoyez une plaquette de silicium de 4 pouces de diamètre, lt;100 'gt; orientation, et avec une couche d’oxyde thermique de 2,4 m d’épaisseur (voir la liste des matériaux),en solution piranha pendant 10 min. La solution Piranha comprend l’acide sulfurique (H2SO4, 96 %) : peroxyde d’hydrogène (H2O2, 30 %) dans un rapport volumétrique de 3:1 et est maintenu à T 388 K.
- Rincer la plaquette avec de l’eau déionisée et sécher sous l’azote (N2) environnement.
3. Photolithographie
- Enrober la plaquette d’hexamethyldisilazane (HMDS) à l’aide d’un dépôt en phase de vapeur pour améliorer l’adhérence au photoresist. Consultez le tableau 1 pour les détails du processus.
- Montez la plaquette sur un mandrin à vide de 4 pouces dans le spin coater. Couvrir la plaquette avec le photoresist AZ-5214E. Utilisez le couche-coater pour répartir uniformément le photoresist sur la surface sous forme de couche de 1,6 m d’épaisseur. Consultez le tableau 2 pour les paramètres de revêtement de spin.
- Cuire la plaquette enduite de photorésistantsur une plaque chauffante maintenue à 110 oC pendant 120 s.
- Transférer la plaquette dans un système d’écriture directe et exposer la plaquette au rayonnement UV pendant 55 ms (défocalise : 5 euros). Cette étape transfère la conception souhaitée sur l’AZ-5214E (utilisé dans le ton positif; voir Liste des matériaux) (Figure 2).
- Placez la plaquette exposée aux UV dans un plat Petri en verre contenant le développeur AZ-726 pour 60 s pour que les caractéristiques se développent. Voir la liste des matériaux pour plus de détails.
- Retirez la plaquette de la solution du développeur et rincez avec de l’eau déionisée (DI) doucement pour éliminer l’excès de développeur. Faire sécher la plaquette dans un environnement N2. Ces étapes sont présentées dans la figure 3A-C.
REMARQUE : À la fin de cette étape, les modèles de conception sur la plaquette peuvent être vus sous un microscope optique standard.
4. Etching anisotropic de silice (SiO2) Couche
REMARQUE : Le but de cette étape est d’éliminer complètement la couche de silice (2,4 m d’épaisseur) qui a été exposée pendant la photolithographie pour exposer la couche de silicium en dessous.
- Après photolithographie, transférer la plaquette dans un système de gravure réactive à ion (RIE) réducteur de plasma (ICP) qui utilise un mélange d’octafluorocyclobutane (C4F8) et d’oxygène (O2) gaz à la silice de gravure verticalement vers le bas (gravure anisotrope).
- Exécuter le processus ICP-RIE pendant environ 13 min pour émousser la couche de silice exposée. Se référer aux paramètres ICP-RIE du tableau 3. Au cours de cette étape, la couche photorésistante est également complètement gravée (Figure 3C-D).
- Pour s’assurer que l’épaisseur de la couche de silice à l’intérieur des motifs désirés est réduite à zéro, de sorte que la couche de silicium est exposée, mesurer l’épaisseur de la silice restante à l’aide d’un réflectomètre. Ajuster la durée de la période de gravure suivante en fonction de l’épaisseur des couches de silice (en particulier dans et autour des motifs).
REMARQUE : Un réflectomètre a été utilisé pour mesurer l’épaisseur de la couche de silice restante43. Alternativement, d’autres outils, tels que l’ellipsomètre ou un tableau de couleur interactif pour prédire la couleur de SiO2 et l’épaisseur peuvent également être utilisés44,45.
Les procédures détaillées aux étapes 1 et 4 sont courantes pour les cavités de réentrant et doublement réentrantes. Cependant, les protocoles de gravure pour la couche de silicium sont différents et sont décrits ci-dessous:
5. Cavités de réentrant
-
Gravure au silicium anisotropique
- Après avoir gravé la couche de silice, transférer la plaquette dans un système ICP-RIE profond pour émousser le silicium. La première étape consiste en une méthode de gravure anisotropique à base de fluor connue sous le nom de procédé Bosch qui taille le silicium verticalement vers le bas, créant un mur droit.
REMARQUE : Le procédé Bosch utilise des gaz C4F8 et de l’hexafluorure de soufre (SF6) dans la chambre de réaction : le dépôt C4F8 crée une couche de passivation, tandis que le SF6 sert le silicium verticalement vers le bas. Ainsi, le procédé Bosch permet la microfabrication de tranchées profondes en silicium avec des rapports à haut aspect. - Exécuter ce processus pendant cinq cycles, ce qui correspond à une profondeur de gravure pour silicium équivalent à 2 m. Les paramètres du processus sont énumérés dans le tableau 4.
- Nettoyez la plaquette dans la solution piranha pendant 10 min pour enlever les restes du processus Bosch. Rincer la plaquette avec de l’eau DI et sécher dans un environnement N2 (Figure 3E).
- Après avoir gravé la couche de silice, transférer la plaquette dans un système ICP-RIE profond pour émousser le silicium. La première étape consiste en une méthode de gravure anisotropique à base de fluor connue sous le nom de procédé Bosch qui taille le silicium verticalement vers le bas, créant un mur droit.
- Gravure au silicium isotropique : Afin de créer la fonction de réentrant, effectuer des gravures isotropes qui créeraient un sous-cut sous la couche de silice. Un surplomb de 5 m peut être réalisé en coupant la couche de silicium avec SF6 pendant 2 min 45 s (Figure 3F). Consultez le tableau 5 pour les paramètres du processus.
-
Gravure au silicium anisotropique : Une fois les caractéristiques de réentrant créées, accordez la profondeur des cavités par le processus Bosch (étape 5.1).
REMARQUE : Pour microfabriquer des cavités d’une profondeur de hc à 50 m, 160 cycles du processus Bosch sont nécessaires ( Figure3G, tableau 4). -
Nettoyage et stockage de gaufrettes
- Nettoyer la plaquette à l’aide de la solution piranha telle que décrite à l’étape 2. Après cette étape, la plaquette devient superhydrophile, caractérisée par des angles de contact de l’eau, o 0 .
- Conserver la plaquette dans un plat Petri en verre et placer à l’intérieur d’un four à vide propre maintenu à T 323 K et la pression du vide PVac 3,3 kPa pour 48 h, après quoi l’angle de contact intrinsèque de la couche de silice se stabilise ào - 40 degrés.
- Conserver les échantillons dans une armoire propre munit d’azote extérieur (99 %) flux, prêt pour une caractérisation ultérieure.
6. Cavités doublement rénissés
- Gravure au silicium anisotropique : Pour créer des cavités doublement réentrantes, suivez les étapes 1, 2, 3, 4 et 5.1 (voir la figure 4A-E).
-
Gravure au silicium isotropique
Afin de créer des fonctionnalités doublement réentrantes, les fonctionnalités de réentrant doivent être créées en premier. Pour ce faire, effectuer des gravures isotropiques pour créer un undercut sous la couche de silice. Etch la couche de silicium avec SF6 pour 25 s (Figure 4F). Consultez le tableau 5 pour les paramètres du processus. Par la suite, nettoyez la plaquette à l’aide de la solution piranha telle que décrite à l’étape 2. -
Croissance de l’oxyde thermique
- Pour obtenir des caractéristiques doublement réentrantes, développez une couche de 500 nm d’oxyde thermique sur la plaquette, à l’aide d’un système de four à haute température (Figure 4G).
- Mesurer l’épaisseur de la couche d’oxyde à l’aide d’un réflectomètre.
REMARQUE : L’oxydation a été effectuée en exposant les échantillons à un environnement comprenant l’oxygène (O2) et la vapeur d’eau, conduisant à l’oxydation humide du silicium dans un environnement clos à des températures allant de 800 à 1 200 oC.
- Gravure de silice : Effectuer le même processus que décrit à l’étape 4 pour équerler la silice verticalement vers le bas pendant 3 min. En raison de la gravure anisotropique, l’oxyde thermique (500 nm de couche de silice épaisse) est gravé loin de la cavité, mais il laisse un « surplomb » le long des parois latérales qui formeraient le bord doublement entrant par la suite (Figure 4H, tableau 3).
- Gravure au silicium anisotropique : Répétez cinq cycles du processus De Bosch pour approfondir les cavités de 2 m (Figure 4I, tableau 5). Cette étape est nécessaire pour enlever le silicium derrière la fonction doublement entrant dans l’étape suivante. Nettoyer la plaquette à l’aide d’une solution piranha.
- Gravure au silicium isotropique : Effectuer la gravure isotropique de silicium pendant 2 min et 30 s en utilisant les paramètres de processus décrits dans le tableau 4. Cette étape crée un espace vide (2 m) derrière l’oxyde cultivé thermiquement à l’embouchure de la cavité, menant au bord doublement réentrant (Figure 4J).
- Gravure au silicium anisotropique : Utilisez la recette du procédé Bosch (étape 5.1) pendant 160 cycles pour augmenter la profondeur des cavités à hc 50 m, ( Figure4K, Tableau 5).
- Nettoyage et stockage des gaufrettes : Nettoyez la plaquette à l’aide de la solution piranha et entreposez-la à l’étape 5.4 ci-dessus.
MICROFABRICATION DE PILLARS
Le protocole de conception pour la fabrication de piliers et d’hybrides (comprenant des piliers doublement reentrants entourés de murs) se compose de trois étapes clés : préparation des gaufrettes, gravure en silice et gravure spécifique au silicium. Figure 5A-C montre la vue d’ensemble de la conception de la mise en page pour les piliers de reentrant et doublement réentrant, tandis que la figure 5D-F représentent la disposition des tableaux hybrides. Sélectionnez l’option de champ sombre de l’exposition aux UV afin d’exposer la plaquette entière, sauf pour le modèle utilisant le même photoresist (AZ5214E) (Figure 6A-C et Figure 7A-C). Outre ces spécificités, les processus de nettoyage de la plaquette (étape 2) et de silice de gravure (étape 4) sont identiques.
7. Piliers de réentrant
- Gravure au silicium anisotropique : Après la photolithographie, l’exposition aux UV, le développement et la silice de gravure avec les spécificités des piliers décrits ci-dessus (étapes 1 à 4), transférez la plaquette vers un système ICP-RIE profond pour graver la couche de silicium à l’aide du procédé Bosch. Cette étape contrôle la hauteur des piliers. Utilisez 160 cycles du processus Bosch pour atteindre des piliers de hauteur, hP 30 m(figure 6E, tableau 5). Nettoyez la plaquette telle que décrite à l’étape 2.
- Gravure au silicium isotropique : Effectuer une gravure isotropique à l’aide de SF6 pendant 5 min pour créer le bord de la rénance sur les piliers (Figure 6F, Tableau 4). La longueur résultante du surplomb est de 5 m.
- Piranha nettoyage et stockage: Nettoyez la plaquette à l’aide de la solution piranha et entreposez-la à l’étape 5.4 ci-dessus.
8. Doublement réentrants Piliers et hybrides
- Gravure au silicium anisotropique : Après la gravure SiO2, transférer la plaquette à un système ICP-RIE profond pour gravure retser le Si sous la couche SiO2. Effectuer cinq cycles du processus Bosch qui correspond à une profondeur de gravure de 2 m (Figure 7E, Tableau 4). Par la suite, nettoyez la plaquette telle que décrite dans l’étape (2).
- Gravure au silicium isotropique : Effectuer des gravures isotropiques à l’aide de SF6 pour 16 s pour créer le bord du réentrant (Tableau 5, Figure 7F). Nettoyez la plaquette telle que décrite à l’étape 2.
- Croissance de l’oxyde thermique : Cultivez une couche d’oxyde thermique de 500 nm sur toute la plaquette à l’aide d’un système de four à haute température tel que décrit à l’étape 6.3 (figure 7G).
- Gravure de silice : Etch la couche d’oxyde cultivée thermiquement (500 nm d’épaisseur) pendant 3 min comme décrit à l’étape 6.4 (Figure 7H, tableau 3).
- Gravure au silicium anisotropique : Répétez 160 cycles du processus Bosch (tableau 4) pour augmenter la hauteur des piliers (Figure 7I). Nettoyez la plaquette telle que décrite à l’étape 2 ci-dessus.
- Gravure au silicium isotropique : Effectuer une gravure isotropique de silicium pendant 5 min en utilisant les paramètres du processus tels que décrits dans le tableau 4. Cette étape crée le bord doublement entrant (Figure 7J). L’espace entre la tige du pilier et le bord doublement reentrant est de 2 m.
- Nettoyage et stockage des gaufrettes : Nettoyez la plaquette à l’aide de la solution piranha et entreposez-la à l’étape 5.4 ci-dessus.
La figure 8 représente la liste des processus utilisés dans la microfabrication des cavités et des piliers de reentrants et doublement réentrants.
Résultats
Dans cette section, nous présentons des cavités de réentrant et doublement réentrant (CR et CRC, figure 9) et des piliers de réentrant et doublement réentrants (RP et DRP, figure 10) microfabriqués à l’aide des protocoles décrits ci-dessus. Toutes les cavités ont le diamètre, DC - 200 m, la profondeur, hC - 50 m, et la distance centre-centre (ou le terrain) entre les cavités adjacentes à l’il en dîmant L C et DC et 12 m. En utilisant les mêmes protocoles de fabrication, des cavités de formes non circulaires peuvent également être préparées, comme indiqué précédemment26.
Le diamètre du bouchon sur le dessus des piliers était DP - 20 m, et leur hauteur et leur hauteur étaient, respectivement, hp - 30 m et LP - 100 m ( Figure10).
Comportements mouillants des microtextures de gaz-entrapping (GEMs)
La silice plate (SiO2) est intrinsèquement mouillage vers la plupart des liquides polaires et non polaires. Par exemple, les angles de contact intrinsèques des gouttelettes d’hexadecane(LV à 20 mN/m à 20 oC) et d’eau (tension de surface à 72,8 mN/m à 20 oC) sur la silice étaient, respectivement, et de 20 et 40 degrés. Cependant, après avoir microfabriqué les cavités et les piliers de la recommunication et du reentrant doublement réentrants, les angles de contact ont changé radicalement (tableau 6). Nous avons mesuré les angles de contact avançant/recul en distribuant/rétractant les liquides au taux de 0,2 L/s et avons trouvé les angles de contact apparents pour les deux liquides, 'r 'gt; 120 ', (omniphobe; Figure 11E). Recul des angles de contact, en raison du manque de discontinuité dans les microtextures, comme dans les microtextures à base de piliers. D’autre part, les surfaces SiO2/Si avec des rangées de piliers doublement réentrants (DRP) présentaient des angles de contact apparents, 'r 'gt; 150 'pour les deux liquides et l’hystérèse d’angle de contact était minime (superomniphobe, Figure 11A et Films S1 et S2). Curieusement, lorsque les mêmes surfaces SiO2/Si avec des rangées de piliers ont été immergés dans les mêmes liquides, ils se sont immiscées instantanément, t lt; 1 s, c’est-à-dire qu’aucun air n’a été piégé (Figure 10A-D, Movie S3). Ainsi, alors que les piliers semblaient superomniphobes en termes d’angles de contact, ils n’ont pas réussi à piéger l’air lors de l’immersion. En fait, les liquides mouillants s’immiscent à partir de la limite de la microtexture (ou de défauts localisés) et déplacer instantanément tout air emprisonné(figure 11A-D et film S3). En revanche, les CRC ont piégé l’air lors de l’immersion dans les deux liquides(figure 11E-H et S1, tableau 1); pour l’hexadecane, l’air emprisonné était intact même après 1 mois26. Nos expériences de microscopie confocale ont démontré que les dispositifs en surplomb stabilisent les liquides intrus et piègent l’air à l’intérieur d’eux (Figure 12A-B).
Ensuite, pour piéger l’air dans des tableaux de DrP, nous avons utilisé les mêmes protocoles de microfabrication pour réaliser des rangées de piliers entourés de murs de profil doublement réentrant (Figure 10G-I). Cette stratégie a isolé les tiges des DRP des liquides mouillants. En conséquence, les microtextures hybrides se sont comportées comme des GEM, comme l’ont confirmé la microscopie confocale (Figure 12C-D) et le film S4, tableau 6). Ainsi, les surfaces de silice avec des microtextures hybrides ont montré l’omniphobicité sur l’immersion en piégeant l’air et en détachant les angles de contact,'r 'gt; 120 ', (omniphobe), et s’est avérée omniphobe dans le vrai sens, c’est-à-à-d.en termes d’angles de contact et d’air de piégeage sur l’immersion. Dans le tableau 6, nous évaluons l’omniphobicité des surfaces SiO2/Siavec une variété de microtextures à base de cavités, de piliers et d’hybrides par angles de contact et immersion.
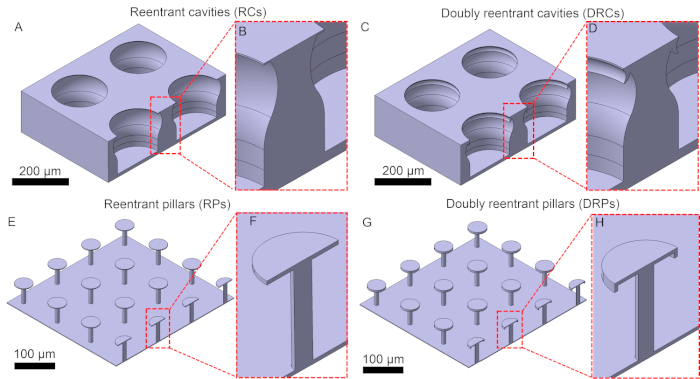
Figure 1 : Schémas de microstructures. (A-B) Cavités de réentrant, (C-D) cavités doublement réentrantes, (E-F) piliers de réentrant, (G-H) piliers doublement réentrants. Veuillez cliquer ici pour voir une version plus grande de ce chiffre.
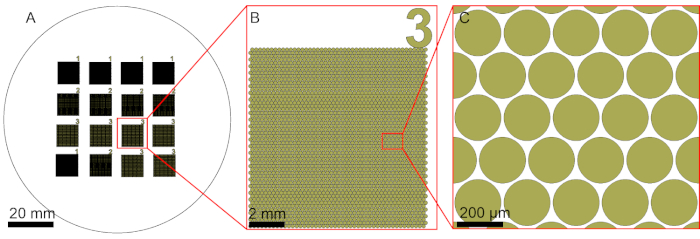
Figure 2 : Modèles de conception pour les cavités. Modèles de conception pour les cavités de reentrant et doublement réentrant générées à l’aide du logiciel de mise en page. Le modèle a été transféré sur la plaquette à l’aide de photolithographie. Veuillez cliquer ici pour voir une version plus grande de ce chiffre.

Figure 3 : Protocole de microfabrication pour les cavités de réentrer. (A) Nettoyez la plaquette de silicium avec 2,4 m de silice épaisse sur le dessus. (B) Enrober la plaquette de photorésistante et exposer à la lumière UV. (C) Développer le photoresist exposé aux UV pour obtenir le modèle de conception. (D) Gravure de la couche de silice supérieure exposée verticalement vers le bas (gravure anisotrope) à l’aide de plasma inductivement couplé (ICP) gravure réactive-ion (RIE). (E) Gravure anisotropique peu profonde de couche de silicium exposée à l’aide d’ICP-RIE profond. (F) Gravure isotropique de silicium pour créer le bord de la réentrante. (G) Gravure profonde de silicium anisotropic pour augmenter la profondeur des cavités. Veuillez cliquer ici pour voir une version plus grande de ce chiffre.
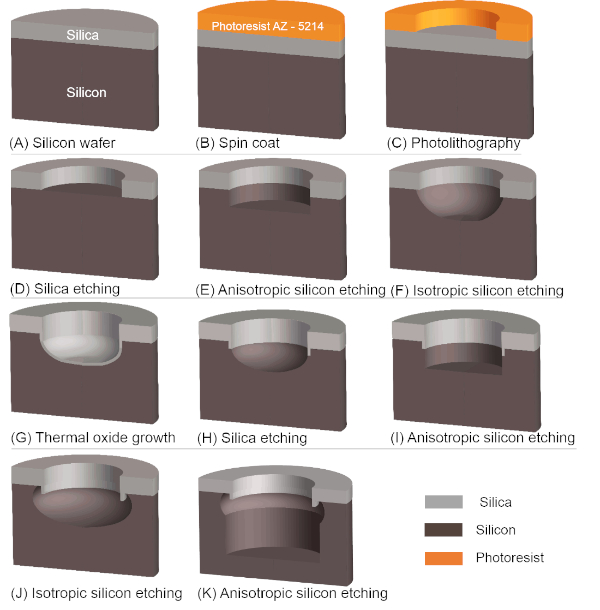
Figure 4 : Protocole de microfabrication pour les cavités doublement réentrantes. (A) Nettoyez la plaquette de silicium avec 2,4 m de silice épaisse sur le dessus. (B) Enrober la plaquette de photorésistante et exposer à la lumière UV. (C) Développer le photoresist exposé aux UV pour obtenir le modèle de conception. (D) Gravure de la couche de silice supérieure exposée verticalement vers le bas (gravure anisotrope) à l’aide de plasma inductivement couplé (ICP) gravure réactive-ion (RIE). (E) Gravure anisotropique peu profonde de couche de silicium exposée à l’aide d’ICP-RIE profond. (F) Gravure isotropique peu profonde de silicium pour créer sous-cut en utilisant ICP-RIE profond. (G) Croissance d’oxyde thermique. (H) Gravure anisotropique de la couche supérieure et inférieure de silice. (I) Gravure anisotropique peu profonde de silicium. (J) Gravure en silicium isotropique pour créer le bord doublement réentrant. (K) Gravure profonde de silicium anisotropic pour augmenter la profondeur des cavités. Veuillez cliquer ici pour voir une version plus grande de ce chiffre.

Figure 5 : Modèles de conception pour les piliers. Modèles de conception pour les piliers réentrants, doublement réentrants et hybrides générés à l’aide du logiciel de mise en page. Le modèle a été transféré sur la plaquette à l’aide de photolithographie. Veuillez cliquer ici pour voir une version plus grande de ce chiffre.
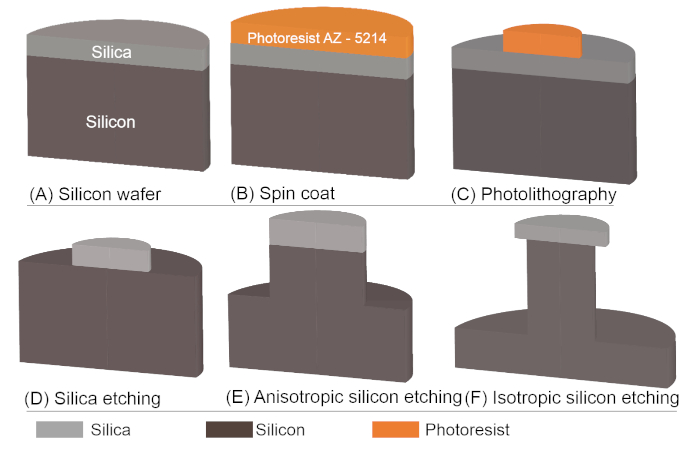
Figure 6 : Protocole de microfabrication des piliers de la réinséctation. (A) Nettoyez la plaquette de silicium avec 2,4 m de silice épaisse sur le dessus. (B) Enrober la plaquette de photorésistante et exposer à la lumière UV. (C) Développer le photoresist exposé aux UV pour obtenir le modèle de conception. (D) Gravure de la couche de silice supérieure exposée verticalement vers le bas (gravure anisotrope) à l’aide de plasma inductivement couplé (ICP) gravure réactive-ion (RIE). (E) Gravure profonde de silicium anisotrope pour augmenter la hauteur des piliers. (F) Gravure au silicium isotropique pour créer le bord de la rénance. Veuillez cliquer ici pour voir une version plus grande de ce chiffre.
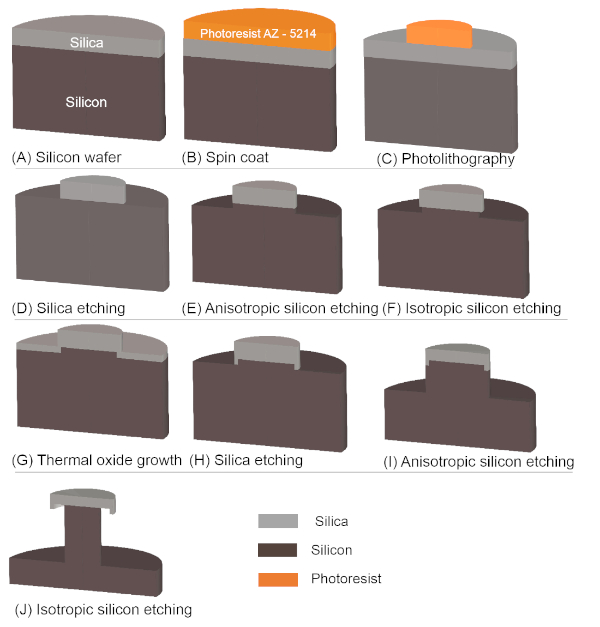
Figure 7 : Protocole de microfabrication pour les piliers doublement réentrants. (A) Nettoyez la plaquette de silicium avec 2,4 m de silice épaisse sur le dessus. (B) Enrober la plaquette de photorésistante et exposer à la lumière UV. (C) Développer le photoresist exposé aux UV pour obtenir le modèle de conception. (D) Gravure de la couche de silice supérieure exposée verticalement vers le bas (gravure anisotrope) à l’aide de plasma inductivement couplé (ICP) gravure réactive-ion (RIE). (E) Gravure anisotropique peu profonde de couche de silicium exposée à l’aide d’ICP-RIE profond. (F) Gravure isotropique peu profonde de silicium pour créer sous-cut en utilisant ICP-RIE profond. (G) Croissance d’oxyde thermique. (H) Gravure anisotropique du haut et du bas de la couche de silice. (I) gravure au silicium anisotropique pour augmenter la hauteur des piliers. (J) Gravure au silicium isotropique pour créer le bord doublement réentrant. Notez que la seule différence entre les piliers doublement réentrants et l’hybride est la conception au début. Veuillez cliquer ici pour voir une version plus grande de ce chiffre.

Figure 8 : Protocole de microfabrication pour les cavités et les piliers de réentrant et doublement réentrants. Le diagramme de flux répertorie les étapes clés impliquées. Veuillez cliquer ici pour voir une version plus grande de ce chiffre.
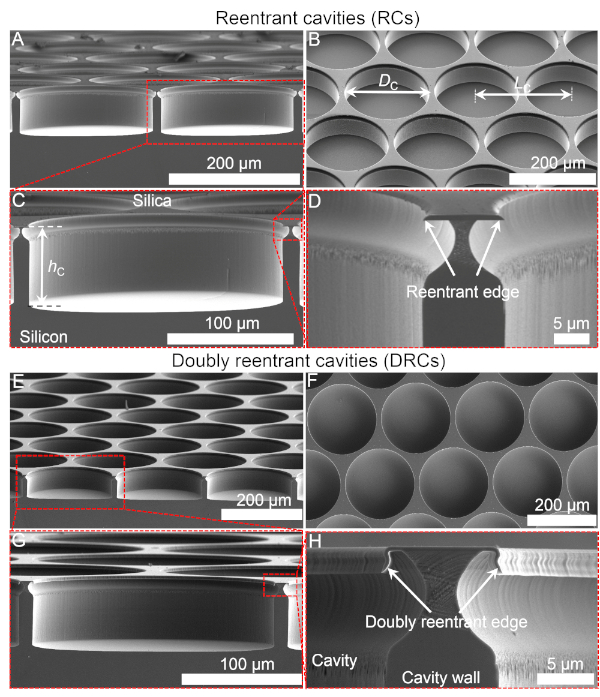
Figure 9 : Micrographies électroniques de balayage des cavités de reentrant et doublement de réentrant. (A-D) Vues transversales et isométriques des surfaces de silice avec un éventail de cavités réentrantes. (E-H) Vues transversales et supérieures des cavités doublement réentrantes. DC - diamètre de la cavité et LC - la distance centre-centre entre les cavités adjacentes (ou hauteur), et hC - profondeur de la cavité. Veuillez cliquer ici pour voir une version plus grande de ce chiffre.
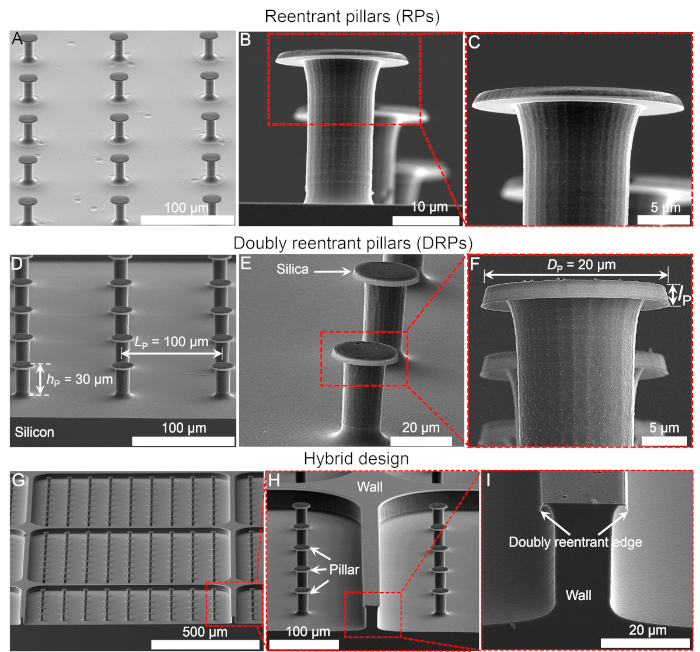
Figure 10 : Micrographies électroniques à balayage des piliers de reentrant et doublement réentrants. (A-C) Vue isométrique des piliers de la réincrédile. (D-F) Doublement réentrants piliers. (G-I) Piliers hybrides - DRP entourés de murs doublement réentrants. DP - diamètre du capuchon du pilier et LP - la distance centre-centre entre les piliers adjacents (ou hauteur), et hP - hauteur des piliers. Figure D-I, réimprimé à partir de Réf.35, Copyright (2019), avec la permission d’Elsevier. Veuillez cliquer ici pour voir une version plus grande de ce chiffre.

Figure 11 : Comportement mouillant. (A) Superomniphobicité des surfaces SiO2/Si ornées de tableaux doublement reentrants piliers, observés en plaçant des gouttes liquides sur le dessus. (B-D) La superomniphobicité est perdue instantanément, si les liquides mouillants touchent la limite ou les défauts localisés. (E) SiO2/Si surfaces ornées de tableaux doublement cavités réentrantes présentent omniphobicité. (F-H) Ces microtextures piègent l’air solidement et ne le perdent pas si le liquide touche la limite ou les défauts localisés. Réimprimé à partir de Réf.35, Copyright (2019), avec la permission d’Elsevier. Veuillez cliquer ici pour voir une version plus grande de ce chiffre.

Figure 12 : microscopie confocale de microtextures immergées dans des liquides. Reconstructions 3D améliorées par ordinateur d’images confocales représentatives (isométriques et transversales le long des lignes pointillées) de transitions de mouillage dans des surfaces de silice avec des cavités doublement réentrantes et des piliers hybrides immergés sous une colonne de z 5 mm après 5 min d’immersion d’eau (A,C) et (B,D) hexadecane. Les (fausses) couleurs bleues et jaunes correspondent aux interfaces de l’eau et de l’hexadecane avec l’air emprisonné. Les ménisques liquides intrus ont été stabilisés au bord doublement entrant. (Barre d’échelle et diamètre de la cavité et du pilier 200 m et 20 m respectivement). La figure 12 a été réimprimée à partir de L’arbitre35, Copyright (2019), avec la permission d’Elsevier. Veuillez cliquer ici pour voir une version plus grande de ce chiffre.
| Étape 1 : Déshydratation et purge de l’oxygène de la chambre | ||
| Étape | Séquence de processus | Temps (min) |
| 1 | Vide (10 Torr) | 1 |
| 2 | Azote (760 Torr) | 3 |
| 3 | Vide (10 Torr) | 1 |
| 4 | Azote (760 Torr) | 3 |
| 5 | Vide (10 Torr) | 1 |
| 6 | Azote (760 Torr) | 3 |
| Étape 2 : Priming | ||
| Séquence de processus | Temps (min) | |
| 7 | Vide (1 Torr) | 2 |
| 8 | HMDS (6 Torr) | 5 |
| Étape 3 : Purging Prime Exhaust | ||
| Séquence de processus | Temps (min) | |
| 9 | Vide | 1 |
| 10 | Azote | 2 |
| 11 | Vide | 2 |
| Étape 4 : Retour à l’atmosphère (remblai) | ||
| Séquence de processus | Temps (min) | |
| 12 | Azote | 3 |
Tableau 1 : Détails du processus pour le revêtement des couches hexamethyldisilazane (HMDS) afin d’améliorer l’adhérence entre la surface de silice et le photoresist AZ-5214E.
| Étape | Vitesse (rpm) | Rampe (rpm/s) | Temps (s) |
| 1 | 800 | 1000 | 3 |
| 2 | 1500 | 1500 | 3 |
| 3 | 3000 | 3000 | 30 |
Tableau 2 : Détails du processus pour atteindre une couche de photorésistance AZ-5214E de 1,6 m d’épaisseur sur les plaquettes SiO2/Si par revêtement de spin.
| Puissance RF, (W) | Puissance ICP, (W) | Pression d’étanchéité, (mTorr) | C4F8 flux (sccm) | O2 flux (sccm) | Température, (C) |
| 100 | 1500 | 10 | 40 | 5 | 10 |
Tableau 3 : Paramètres de réglage pour la gravure à la silice utilisée dans le plasma inductif couplé - Gravure à l’ion réactif (ICP-RIE).
| Puissance RF, (W) | Puissance ICP, (W) | Pression d’étanchéité, (mTorr) | Flux SF6, (sccm) | Température, (C) |
| 20 | 1800 | 35 | 110 | 15 |
Tableau 4 : Paramètres de paramètres pour la gravure au silicium (isotropique) utilisée dans le plasma couplé inductivement - gravure à l’ion réactif profond (ICP-DRIE).
| Étape | Puissance RF, (W) | Puissance ICP, (W) | Pression d’étanchéité, (mTorr) | Flux SF6, (sccm) | C4F8 flux, (sccm) | Température, (C) | Dépôt/ Temps d’étanchéité, (s) |
| Couche de passivation | 5 | 1300 | 30 | 5 | 100 | 15 | 5 |
| Gravure | 30 | 1300 | 30 | 100 | 5 | 15 | 7 |
Tableau 5 : Paramètres de paramètres pour la gravure au silicium (anisotropique) utilisée dans le plasma couplé inductivement - gravure à l’ion réactif profond (ICP-DRIE).
| Surfaces | Critère : Angles de contact dans l’air | Critère : Immersion | |||
| Eau | Hexadecane | Eau | Hexadecane | ||
| Les DrP | àr | 153 à 1 | 153 degrés et 1 | Pénétration instantanée | Pénétration instantanée |
| AA | 161 à 2 degrés | 159 degrés et 1 | |||
| R | 139 à 1 | 132 degrés et 1 | |||
| Évaluation: | Superomniphobe | Pas omniphobe - en fait, omniphile | |||
| Les CDR | àr | 124 degrés et 2 degrés | 115 degrés à 3 degrés | Air piégé (omniphobe) | Air piégé (omniphobe) |
| AA | 139 ' à 3 ' | 134 degrés à 5 degrés | |||
| R | 0 et plus | 0 et plus | |||
| Évaluation: | Omniphobe | Omniphobe | |||
| Hybrides | àr | 153 degrés 2 degrés | 153 degrés et 2 degrés | Air piégé (omniphobe) | Air piégé (omniphobe) |
| AA | 161 degrés 2 degrés | 159 degrés et 2 degrés | |||
| R | 0 et plus | 0 et plus | |||
| Évaluation: | Omniphobe | Omniphobe | |||
Tableau 6 : Mesures de l’angle de contact -progression (A), recul (R), et apparente (r) et immersion dans les liquides. Ce tableau a été réimprimé à partir de Lrép35, Copyright (2019), avec la permission d’Elsevier.
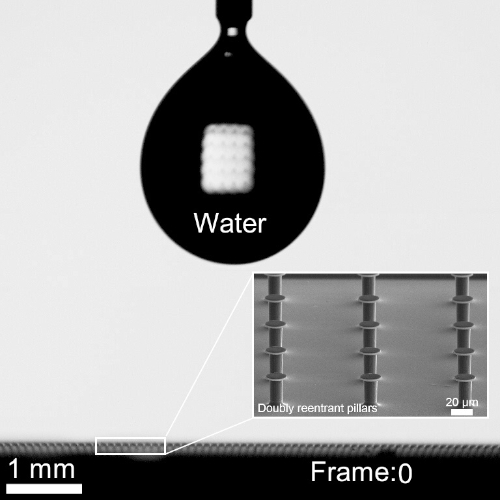
Film S1 : Séquence d’image à grande vitesse (15K fps) de gouttelettes d’eau rebondissant à partir de surfaces microtexturées composées de piliers doublement réentrants. Ce film a été réimprimé à partir de l’arbitre 35. Droit d’auteur (2019), avec la permission d’Elsevier. S’il vous plaît cliquez ici pour voir cette vidéo (Cliquez à droite pour télécharger).
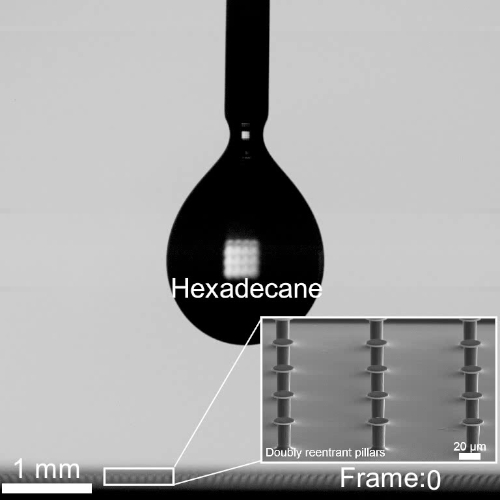
Film S2: Séquence d’image à grande vitesse (19K fps) de gouttelette d’hexadecane rebondissant à partir de surfaces microtexturées composées de piliers doublement réentrants. Ce film a été réimprimé à partir de l’arbitre 35. Droit d’auteur (2019), avec la permission d’Elsevier. S’il vous plaît cliquez ici pour voir cette vidéo (Cliquez à droite pour télécharger).
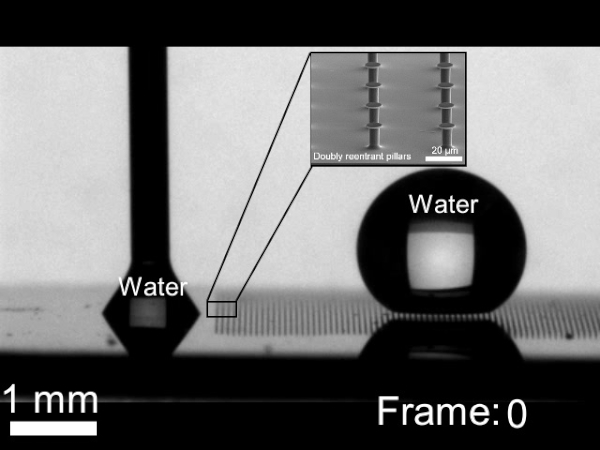
Film S3: Séquence d’image (200 fps) de l’imbibition de l’eau dans la microtexture composée de piliers doublement réentrants. Ce film a été réimprimé à partir de l’arbitre 35. Droit d’auteur (2019), avec la permission d’Elsevier. S’il vous plaît cliquez ici pour voir cette vidéo (Cliquez à droite pour télécharger).
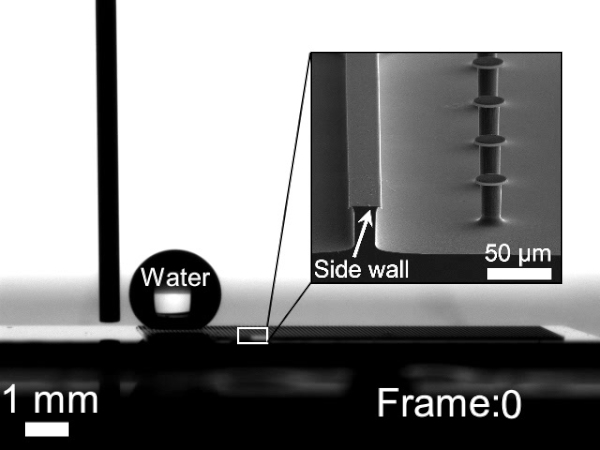
Film S4: Séquence d’image (200 fps) goutte d’eau avançant à côté de la microtexture hybride. La présence d’un mur de délimitation doublement réentrant empêche l’invasion liquide dans la microtexture, ce qui rend la surface omniphobe sous immersion aussi. Ce film a été réimprimé à partir de l’arbitre 35. Droit d’auteur (2019), avec la permission d’Elsevier. S’il vous plaît cliquez ici pour voir cette vidéo (Cliquez à droite pour télécharger).
Discussion
Nous discutons ici des facteurs supplémentaires et des critères de conception pour aider le lecteur à appliquer ces protocoles de microfabrication. Pour les microtextures de cavité (CR et CRC), le choix de la hauteur est crucial. Des parois plus minces entre les cavités adjacentes entraîneraient une faible surface interfaciale liquide-solide et une zone interfaciale à haute vapeur liquide, ce qui entraînerait des angles de contact apparents élevés34. Cependant, des murs minces pourraient compromettre l’intégrité mécanique de la microtexture, par exemple, lors de la manipulation et de la caractérisation; un peu trop d’étanchéité avec des murs minces (p. ex., à l’étape 6.6) pourrait détruire toute la microtexture; sous-gravure avec des murs minces pourrait également empêcher le développement de dispositifs doublement de reentrant. Si les caractéristiques de la RDC ne sont pas entièrement développées, leur capacité à piéger l’air à long terme pourrait en souffrir, surtout si le liquide se condense à l’intérieur des cavités26. Pour cette raison, nous avons choisi le terrain dans nos expériences pour être L D - D - 12 m (c.-à-d., l’épaisseur minimale du mur entre les cavités était de 12 m). Nous avons également fabriqué des cavités doublement réentrantes avec un pas plus petit de L d’un d’un grand nombre de 5 m, mais les surfaces qui en ont résulté n’étaient pas homogènes en raison de dommages structurels lors de la microfabrication.
Pendant la gravure de la couche de silice avec C4F8 et O2 à l’étape 4, l’historique antérieur de l’utilisation ou la propreté de la chambre de réaction pourrait donner des résultats variables, malgré les mêmes étapes, par exemple, dans un établissement utilisateur commun comme dans la plupart des universités. Ainsi, il est recommandé que cette étape soit effectuée dans de courtes périodes de temps, par exemple, pas plus de 5 min chacun et surveillé l’épaisseur de la couche de silice par une technique indépendante, telle que la réflectométrie. Pour nos gaufrettes avec une couche de silice de 2,4 m d’épaisseur, une routine de gravure typique a pris 13 min pour enlever complètement la silice des zones ciblées (tableau 3). Étant donné que le photoresist a également été gravé pendant le processus, cette étape a enlevé 1 m de la couche de silice qui a été initialement masquée par le photoresist. De plus, pour s’assurer que le taux de gravure était comme prévu et pour éviter la contamination croisée des procédés antérieurs de gravure (un problème courant dans les installations multi-utilisateurs), la gravure à la silice a toujours été précédée par la gravure d’une plaquette sacrificielle par mesure de précaution. Pendant le développement du photoresist, la surface exposée pourrait être contaminée par les traces/particules du photorésistant, ce qui pourrait servir de masques (microscopiques) conduisant à la formation de résidus de broches. Pour éviter cela, des protocoles rigoureux de nettoyage et de stockage doivent être suivis tout au long du processus de microfabrication36.
De même, pendant le processus Bosch, même si la couche SiO2 agit comme un masque pour la couche Si en dessous, il est gravé pendant de longs cycles de gravure, mais à des rythmes plus lents. Ainsi, la profondeur des cavités ou la hauteur des piliers est limitée jusqu’au point que les caractéristiques de la répartie ne seront pas compromises. Les temps de passivation et de gravure pendant le processus Bosch doivent être réglés pour obtenir des murs lisses. Pour ce faire, on teste les recettes de façon itérative et en observant leurs effets sur des échantillons, par exemple, en utilisant la microscopie électronique.
Dans le cas des RP et des DRP, plus la durée de la gravure isotropique est longue, plus le diamètre de la tige est petit. Si le diamètre est inférieur à 10 m, il pourrait conduire à une fragilité mécanique. Cette limitation devrait éclairer la conception au début de la procédure de microfabrication.
Les outils d’gravure à sec couramment disponibles dans les universités n’ont pas de tolérance séparicne industrielle, ce qui entraîne des non-uniformités spatiales en termes de taux de gravure à l’intérieur de la chambre. Ainsi, les caractéristiques obtenues au centre de la plaquette peuvent ne pas être les mêmes que celles de la limite. Pour surmonter cette limitation, nous avons utilisé des gaufrettes de quatre pouces et nous nous sommes concentrés uniquement dans la région centrale.
Nous recommandons également d’utiliser des systèmes d’écriture directe au lieu d’utiliser des masques à contact dur pour la photolithographie, permettant des changements rapides dans les paramètres de conception, y compris les diamètres des entités, les emplacements et les formes (circulaires, hexagonales et carrées), etc.
Évidemment, ni les gaufrettes SiO2/Si ni la photolithographie ne sont les matériaux ou les procédés souhaités pour la production de masse de surfaces omniphobes. Cependant, ils servent d’excellent système modèle pour explorer les microtextures innovantes pour l’ingénierie des surfaces omniphobes, par exemple par biomimétique26,27,34,35,46,47, qui peut être traduit à faible coût et des systèmes de matériaux évolutifs pour les applications. On s’attend à ce que dans un proche avenir, les principes de conception pour les GEM pourraient être étendus en utilisant des techniques telles que l’impression 3D48, la fabrication additive49, et le laser micromachining50, entre autres. Les surfaces SiO2/Si microtexturées pourraient également être utilisées pour templier les matières douces29,51. Actuellement, nous étudions les applications de nos surfaces de piégeage de gaz pour atténuer les dommages de cavitation47, dessalement46,52, et la réduction de la traînée hydrodynamique.
Déclarations de divulgation
Les auteurs déclarent qu’ils n’ont pas d’intérêts contradictoires.
Remerciements
HM reconnaît le financement de l’Université des sciences et de la technologie du roi Abdallah (KAUST).
matériels
| Name | Company | Catalog Number | Comments |
| AZ-5214 E photoresist | Merck | DEAA070796-0W59 | Photoresist, flammable liquid |
| AZ-726 MIF developer | Merck | 10055824960 | To develop photoresist |
| Confocal microscopy | Zeiss | Zeiss LSM710 | Upright confocal microscope to visualize liquid meniscus shape |
| Deep ICP-RIE | Oxford Instruments | Plasmalab system100 | Silicon etching tool |
| Direct writer | Heidelberg Instruments | µPG501 | Direct-writing system |
| Drop shape analyzer | KRUSS | DSA100 | To measure contact angle |
| Hexadecane | Alfa Aesar | 544-76-3 | Test liquid |
| Highspeed imaging camera | Phantom vision research | v1212 | To image droplet bouncing |
| HMDS vapor prime | Yield Engineering systems | ||
| Hot plate | Cost effective equipments | Model 1300 | |
| Hydrogen peroxide 30% | Sigma Aldrich | 7722-84-1 | To prepare piranha solution |
| Imaris software | Bitplane | Version 8 | Post process confocal microscopy images |
| Nile Red | Sigma Aldrich | 7385-67-3 | Fluorescent dye for hexadecane |
| Nitrogen gas | KAUST lab supply | To dry the wafer | |
| Petri dish | VWR | HECH41042036 | |
| Reactive-Ion Etching (RIE) | Oxford Instruments | Plasmalab system100 | Silica etching tool |
| Reflectometer | Nanometrics | Nanospec 6100 | To check remaining oxide layer thickness |
| Rhodamine B (Acros) | Fisher scientific | 81-88-9 | Fluorescent dye for water |
| SEM stub | Electron Microscopy Sciences | 75923-19 | |
| SEM-Quanta 3D | FEI | Quanta 3D FEG Dual Beam | |
| Silicon wafer | Silicon Valley Microelectronics | Single side polished, 4" diameter, 500 µm thickness, 2.4 µm thick oxide layer | |
| Spin coater | Headway Research,Inc | PWM32 | |
| Spin rinse dryer | MicroProcess technology | Avenger Ultra -Pure 6 | Dry the wafers after piranha clean |
| Sulfuric acid 96% | Technic | 764-93-9 | To prepare piranha solution |
| Tanner EDA L-Edit software | Tanner EDA, Inc. | version15 | Layout design |
| Thermal oxide growth | Tystar furnace | To grow thermal oxide in patterned silicon wafer | |
| Tweezers | Excelta | 490-SA-PI | Wafer tweezer |
| Vacuum oven | Thermo Scientific | 13-258-13 | |
| Water | Milli-Q | Advantage A10 | Test liquid |
Références
- Butt, H. J., et al. Characterization of super liquid-repellent surfaces. Current Opinion in Colloid & Interface Science. 19 (4), 343-345 (2014).
- Lee, J., Laoui, T., Karnik, R. Nanofluidic transport governed by the liquid/vapour interface. Nature Nanotechnology. 9 (4), 317-323 (2014).
- Subramanian, N., et al. Evaluating the potential of superhydrophobic nanoporous alumina membranes for direct contact membrane distillation. Journal of Colloid and Interface Science. 533, 723-732 (2019).
- Xue, Z. X., Cao, Y. Z., Liu, N., Feng, L., Jiang, L. Special wettable materials for oil/water separation. Journal of Materials Chemistry A. 2 (8), 2445-2460 (2014).
- Zhang, L. B., Zhong, Y. J., Cha, D., Wang, P. A self-cleaning underwater superoleophobic mesh for oil-water separation. Scientific Reports. 3, (2013).
- Leslie, D. C., et al. A bioinspired omniphobic surface coating on medical devices prevents thrombosis and biofouling. Nature Biotechnology. 32 (11), 1134-1140 (2014).
- Lee, C., Choi, C. H., Kim, C. J. Superhydrophobic drag reduction in laminar flows: a critical review. Experiments in Fluids. 57 (176), (2016).
- Tuteja, A., Choi, W., Mabry, J. M., McKinley, G. H., Cohen, R. E. Robust omniphobic surfaces. Proceedings of the National Academy of Sciences of the United States of America. 105 (47), 18200-18205 (2008).
- Brown, P. S., Bhushan, B. Mechanically durable, superoleophobic coatings prepared by layer-by-layer technique for anti-smudge and oil-water separation. Scientific Reports. 5, (2015).
- Wong, T. S., et al. Bioinspired self-repairing slippery surfaces with pressure-stable omniphobicity. Nature. 477 (7365), 443-447 (2011).
- Milionis, A., Dang, K., Prato, M., Loth, E., Bayer, I. Liquid repellent nanocomposites obtained from one-step water-based spray. Journal of Materials Chemistry A. 3 (24), 12880-12889 (2015).
- Mishra, H., et al. Time-Dependent Wetting Behavior of PDMS Surfaces with Bioinspired, Hierarchical Structures. ACS Applied Materials & Interfaces. 8 (12), 8168-8174 (2016).
- Hendren, Z. D., Brant, J., Wiesner, M. R. Surface modification of nanostructured ceramic membranes for direct contact membrane distillation. Journal of Membrane Science. 331 (12), 1-10 (2009).
- Rezaei, M., et al. Wetting phenomena in membrane distillation: Mechanisms, reversal, and prevention. Water Research. 139, 329-352 (2018).
- Verho, T., et al. Mechanically Durable Superhydrophobic Surfaces. Advanced Materials. 23, 673-678 (2011).
- Boinovich, L., Emelyanenko, A. M., Pashinin, A. S. Analysis of Long-Term Durability of Superhydrophobic Properties under Continuous Contact with Water. ACS Applied Materials & Interfaces. 2 (6), 1754-1758 (2010).
- Herminghaus, S. Roughness-induced non-wetting. Europhysics Letters. 52 (2), 165-170 (2000).
- Abdelsalam, M. E., Bartlett, P. N., Kelf, T., Baumberg, J. Wetting of regularly structured gold surfaces. Langmuir. 21 (5), 1753-1757 (2005).
- Liu, J. L., Feng, X. Q., Wang, G. F., Yu, S. W. Mechanisms of superhydrophobicity on hydrophilic substrates. Journal of Physics-Condensed Matter. 19 (35), (2007).
- Nosonovsky, M. Multiscale roughness and stability of superhydrophobic biomimetic interfaces. Langmuir. 23 (6), 3157-3161 (2007).
- Marmur, A. From hygrophilic to superhygrophobic: Theoretical conditions for making high-contact-angle surfaces from low-contact-angle materials. Langmuir. 24 (14), 7573-7579 (2008).
- Hensel, R., et al. Wetting Resistance at Its Topographical Limit: The Benefit of Mushroom and Serif T Structures. Langmuir. 29 (4), 1100-1112 (2013).
- Bormashenko, E. Progress in understanding wetting transitions on rough surfaces. Advances in Colloid and Interface Science. 222, 92-103 (2015).
- Patankar, N. A. Thermodynamics of trapping gases for underwater superhydrophobicity. Langmuir. 32 (27), 7023-7028 (2016).
- Kaufman, Y., et al. Simple-to-Apply Wetting Model to Predict Thermodynamically Stable and Metastable Contact Angles on Textured/Rough/Patterned Surfaces. The Journal of Physical Chemistry C. 121 (10), 5642-5656 (2017).
- Domingues, E. M., Arunachalam, S., Nauruzbayeva, J., Mishra, H. Biomimetic coating-free surfaces for long-term entrapment of air under wetting liquids. Nature Communications. 9 (1), 3606(2018).
- Liu, T. Y., Kim, C. J. Turning a surface superrepellent even to completely wetting liquids. Science. 346 (6213), 1096-1100 (2014).
- Hensel, R., Neinhuis, C., Werner, C. The springtail cuticle as a blueprint for omniphobic surfaces. Chemical Society Reviews. 45 (2), 323-341 (2016).
- Hensel, R., et al. Biologically Inspired Omniphobic Surfaces by Reverse Imprint Lithography. Advanced Materials. 26 (13), 2029-2033 (2014).
- Hensel, R., et al. Tunable nano-replication to explore the omniphobic characteristics of springtail skin. Npg Asia Materials. 5, (2013).
- Helbig, R., Nickerl, J., Neinhuis, C., Werner, C. Smart Skin Patterns Protect Springtails. PLOS ONE. 6 (9), 25105(2011).
- Cheng, L. Marine and Freshwater Skaters: Differences in Surface Fine Structures. Nature. 242, 132(1973).
- Andersen, N. M., Cheng, L. The marine insect Halobates (Heteroptera: Gerridae): biology, adaptations, distribution, and phylogeny. Oceanography and marine biology: an annual review. 42, 119-180 (2004).
- Domingues, E. M., Arunachalam, S., Mishra, H. Doubly Reentrant Cavities Prevent Catastrophic Wetting Transitions on Intrinsically Wetting Surfaces. ACS Applied Materials & Interfaces. 9 (25), 21532-21538 (2017).
- Arunachalam, S., Das, R., Nauruzbayeva, J., Domingues, E. M., Mishra, H. Assessing omniphobicity by immersion. Journal of Colloid and Interface Science. 534, 156-162 (2019).
- Christian Koch, E. A. Photolithography: Basics of Microstructuring. , MicroChemicals GmbH. (2017).
- Jansen, H., de Boer, M., Legtenberg, R., Elwenspoek, M. The black silicon method: a universal method for determining the parameter setting of a fluorine-based reactive ion etcher in deep silicon trench etching with profile control. Journal of Micromechanics and Microengineering. 5 (2), 115(1995).
- Jansen, H. V., de Boer, M. J., Unnikrishnan, S., Louwerse, M., Elwenspoek, M. C. Black silicon method X: a review on high speed and selective plasma etching of silicon with profile control: an in-depth comparison between Bosch and cryostat DRIE processes as a roadmap to next generation equipment. Journal of Micromechanics and Microengineering. 19 (3), 033001(2009).
- Xiu, Y., Zhu, L., Hess, D. W., Wong, C. Hierarchical silicon etched structures for controlled hydrophobicity/superhydrophobicity. Nano Letters. 7 (11), 3388-3393 (2007).
- Azeredo, B., et al. Silicon nanowires with controlled sidewall profile and roughness fabricated by thin-film dewetting and metal-assisted chemical etching. Nanotechnology. 24 (22), 225305(2013).
- Coffinier, Y., et al. Preparation of superhydrophobic silicon oxide nanowire surfaces. Langmuir. 23 (4), 1608-1611 (2007).
- Tanner, E. L-Edit-The layout editor. Reference Manual. , Available from: https://usermanual.wiki/Document/LEdit20Manual.38314693/view (2009).
- NANOSPEC 6100 Series Operators Users Manual. , Nanometrics. Available from: https://cmi.epfl.ch/metrology/Nanospec_AFT6100_Manual.pdf (2019).
- Deal, B. E., Grove, A. General relationship for the thermal oxidation of silicon. Journal of Applied Physics. 36 (12), 3770-3778 (1965).
- Woollam, J. A., et al. Spectroscopic ellipsometry from the vacuum ultraviolet to the far infrared. AIP Conference Proceedings. 550 (1), 511-518 (2001).
- Das, R., Arunachalam, S., Ahmad, Z., Manalastas, E., Mishra, H. Bio-inspired gas-entrapping membranes (GEMs) derived from common water-wet materials for green desalination. Journal of Membrane Science. , 117185(2019).
- Gonzalez-Avila, S. R., Nguyen, D. M., Arunachalam, S., Domingues, E. M., Mishra, H., Ohl, C. D. Mitigating cavitation erosion using biomimetic gas-entrapping microtextured surfaces. Science Advances. , In-press (2020).
- Liu, X., et al. 3D Printing of Bioinspired Liquid Superrepellent Structures. Advanced Materials. 30 (22), 1800103(2019).
- Jafari, R., Cloutier, C., Allahdini, A., Momen, G. Recent progress and challenges with 3D printing of patterned hydrophobic and superhydrophobic surfaces. The International Journal of Advanced Manufacturing Technology. , 1-14 (2019).
- Vorobyev, A. Y., Guo, C. L. Multifunctional surfaces produced by femtosecond laser pulses. Journal of Applied Physics. 117 (3), 033103(2015).
- Xu, M., Kim, C. J. Method for manufacturing re-entrant microstructures. US Patent App. , 15/546,260 (2018).
- Das, R., Arunachalam, S., Ahmad, Z., Manalastas, E., Syed, A., Buttner, U., Mishra, H. Proof-of-Concept for Gas-Entrapping Membranes Derived from Water-Loving SiO2/Si/SiO2 Wafers for Greener Desalination. Journal of Visualized Experiments. , In-press e60583(2020).
Réimpressions et Autorisations
Demande d’autorisation pour utiliser le texte ou les figures de cet article JoVE
Demande d’autorisationExplorer plus d’articles
This article has been published
Video Coming Soon