A subscription to JoVE is required to view this content. Sign in or start your free trial.
Method Article
بمساعدة البلازما الجزيئية شعاع إبيتاز من InAlN من العوائق الترانزستور عالية الإلكترون التنقل N-القطبية
In This Article
Summary
يستخدم الجزيئية تناضد شعاع لزراعة N-القطبية الترانزستورات InAlN من الحواجز العالية الإلكترون التنقل (HEMTs). السيطرة على إعداد ويفر، وظروف نمو طبقة والهيكل الفوقي النتائج في سلسة، وطبقات InAlN متجانسة بشكل إنشائي وHEMTs مع حركية عالية مثل 1750 سم 2 / V ∙ ثانية.
Abstract
بمساعدة البلازما الجزيئية شعاع تناضد هي مناسبة تماما لنمو الفوقي من الثالث إلى نيتريد الأغشية الرقيقة وheterostructures مع نحو سلس، واجهات مفاجئة اللازمة لعالية الجودة الترانزستورات عالية الإلكترون التنقل (HEMTs). ويرد الإجراء لنمو HEMTs InAlN N-القطبي، بما في ذلك إعداد ويفر ونمو طبقات عازلة، طبقة InAlN الحاجز، ن. والجاليوم interlayers وقناة الجاليوم. ويتم تحديد القضايا الحرجة في كل خطوة من خطوات عملية، مثل تجنب تراكم جورجيا في المخزن المؤقت الجاليوم، ودور درجة الحرارة على InAlN التجانس التركيبي، واستخدام الجا تدفق خلال البينية ن. وقبل الجاليوم النمو قناة المقاطعة. وقد أثبت متجانسة بشكل إنشائي N-القطبية InAlN الأغشية الرقيقة مع سطح جذر متوسط تربيع منخفضة تصل إلى 0.19 نانومتر، وخشونة يتم الإبلاغ عن الهياكل HEMT وجود حركية عالية مثل 1750 سم 2 / V ∙ ثانية للأجهزة مع كثافة الشحنة ورقة InAlN القائم 1.7 × 1013 سم -2.
Introduction
الشعاع الجزيئي تنضيد (مبي) هو تقنية الفوقي تنوعا رقيقة النمو التي توظف بيئة فراغ عالية جدا مع الضغوط قاعدة منخفضة تصل إلى 10 -11 عربة لضمان انخفاض التأسيس النجاسة في الفيلم نمت. يتم تحديد معدل تكوين ونمو الطبقات نمت epitaxially عن طريق التحكم في درجة حرارة كل خلية الانصباب، وبالتالي تدفق تبخر من مختلف المواد المصدر. في حالة تنضيد III-نيتريد، المجموعة عادة يتم توفير III-العناصر (في، القاعدة، الجا) من قبل خلايا انصباب بينما النيتروجين النشط وتقدم (N *) التدفق من خلال إما N 2 البلازما 1،2 (RF البلازما مبي -assisted: PAMBE أو RFMBE) أو الأمونيا (NH 3 -MBE) يتميز 3،4 النمو مبي من انخفاض درجات الحرارة النمو وضوحا فجائية بينية من تقنيات النمو الفوقي أخرى، مثل metalorganic ترسيب الأبخرة الكيميائية 5 ويرد التخطيطي. في الشكل 1.
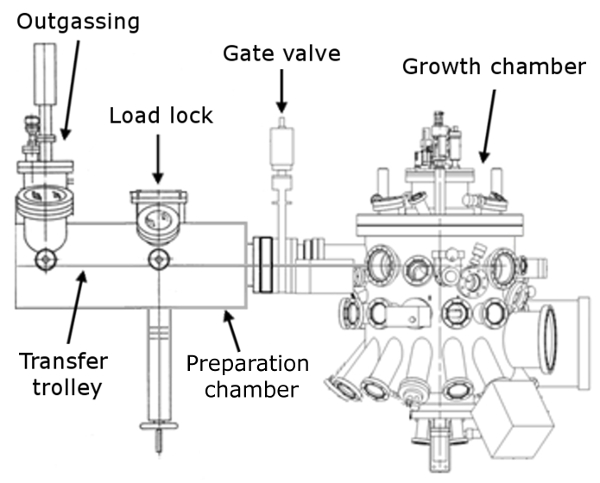
الشكل 1:.. نظام مبي التخطيطي تخطيطي يظهر الغرفة قفل الحمل، ونظام نقل ومحطة إطلاق الغازات والنمو الرجاء انقر هنا لعرض نسخة أكبر من هذا الرقم.
III-نتريدات يمكن زراعتها على ركائز وجود مجموعة متنوعة من التوجهات وضوح الشمس. التوجه الأكثر شيوعا هو ج -plane جا القطبية، والذي يسمح بتشكيل الغاز الإلكترون ثنائية الأبعاد دون الكشف عن المنشطات من خلال الاستفادة من الفرق في الاستقطاب بين طبقة الحاجز، عادة ألجان، وقناة الجاليوم. وقد تلقى توجهات مختلفة غير القطبية وشبه القطبية من الجاليوم اهتماما كبيرا لالإلكترونيات الضوئية نظرا لانخفاض تأثيرات الاستقطاب في الآبار الكم، 6،7 مما يجعل هذه التوجهات اقل من المرغوب فيه أيضا عن الطلبات، HEMTنانو ثانية. الأجهزة الموجهة N-القطبية جذابة للجيل المقبل من ارتفاع وتيرة عملية HEMT بسبب العديد من المزايا الجوهرية عبر أجهزة جا القطبية التقليدية. 8 ويزرع طبقة حاجز في أجهزة N-القطبية تحت قناة الجاليوم كما هو مبين في الشكل 2، مما أدى في الحاجز الخلفي الطبيعي أن يساعد تحكم كهرباء القناة ويقلل من الآثار قناة قصيرة، في الوقت الذي تسمح سهولة الوصول الحالي إلى قناة الجاليوم وتقليل مقاومة للإتصال به. ويمكن أيضا أن الحاجز يمكن السيطرة عليها بشكل منفصل من القناة، بحيث كما يتم تحجيم سمك قناة أسفل للأجهزة عالية التردد تصميم الحاجز يمكن تعديل للتعويض عن تهمة قناة خسر أمام مستوى تعلق الآثار فيرمي.
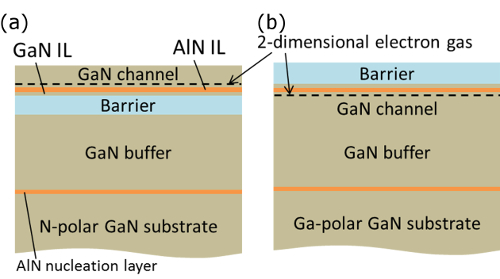
الشكل 2: الفوقي طبقة التخطيطي هيكل طبقة من (أ) HEMT N-القطبي و (ب) HEMT لجا القطبي لcomparison. الرجاء انقر هنا لعرض نسخة أكبر من هذا الرقم.
HEMTs المستخدمة في سرعة عالية، وتزرع مكبرات الصوت عالية الطاقة عادة على ركائز كربيد للاستفادة من الموصلية الحرارية العالية من كربيد. يمكن استخدام منخفضة خيوط خلع ركائز الكثافة قائما بذاته الجاليوم لتحسين التنقل الإلكترون، 9 وبالتالي تحسين أداء عالية التردد. بعد نمو طبقة ن. التنوي، ويزرع منطقة عازلة الجاليوم سميك لفصل مكانيا الشوائب في واجهة إعادة نمو من القناة HEMT وتحسين العزل الكهربائي. وخلافا للمواد III-V أخرى، الجاليوم نمت بنسبة PAMBE يحتاج عادة ظروف النمو مع نسبة مجموعة-III / V أكبر من 1، أي ظروف غني بالمعادن، 10،11 من أجل تحقيق التشكل سطح أملس. في العاشر آل 1- س N هو مذبحوتلقى المواد حاجز الأم لHEMTs III-نيتريد، واهتماما كبيرا في الآونة الأخيرة لأنه يمكن زراعتها مطابقة شعرية لالجاليوم ل x ≈ 0.18 ويمكن أن تولد أكثر من مرتين قناة تهمة المتعلقة الحواجز ألجان استحقاقها الاستقطاب عفوية عالية. 12-15 على خلاف الحواجز ألجان، والجا تتضمن تفضيلي في في طبقات InAlN، 16 وبالتالي يجب توخي الحذر لضمان سطح خال من فائض جورجيا بعد نمو طبقة جورجيا الغنية عازلة الجاليوم وقبل نمو InAlN.
السيطرة على جورجيا على السطح ويمكن تحقيق ذلك عن طريق توريد والجا تدفق أقل قليلا من تدفق اللازمة لتشكيل جا قطرة. ومع ذلك، هذه النافذة نمو صغير، وعدم كفاية تغطية سطح الجا سوف تتسبب في التشكل السطح لتتحلل في التشكل هضبة / خندق في حين الزائد الجا تدفق سيؤدي إلى تراكم جورجيا وتشكيل الحبرية العيانية 17 انعكاس عالية الطاقة الإلكترون حيود (RHEED) INTENS إيتي يمكن استخدامها لمراقبة تراكم جورجيا والامتزاز. يشار إلى تغطية سطح الجا انخفاض في كثافة RHEED، وأي فجوة بين إغلاق الجا (وN *) مصاريع والزيادة الأولية في كثافة RHEED تشير تراكم الجا، كما هو مبين في الشكل (3).

الشكل (3): رصد تغطية الجا مع RHEED كثافة RHEED إشارة كثافة يقاس من نمط RHEED التي تحصل عليها بموجب تناوب باستخدام اكتساب المشغلة. يشار عدم كفاية تدفق الجا من زيادة فورية في كثافة بعد إغلاق مصاريع (لا يظهر). يشار المشبعة / تغطية الجا مثالية من تأخير بين إغلاق مصراع والمفاجئ اشراق RHEED وتغطية الجا الزائدة في رأينا على حد سواء تأخير في اشراق RHEED الأولي وكذلك زيادة كثافة أكثر تدرجا مما أدى إلى انتعاش كثافة الكامل يستغرق وقتا أطول من 60 ثانية.كوم / ملفات / ftp_upload / 54775 / 54775fig3large.jpg "الهدف =" _ فارغة "> الرجاء انقر هنا لعرض نسخة أكبر من هذا الرقم.
ويزيد من تعقيد تحقيق جودة عالية InAlN التي كتبها PAMBE من وجود تقلبات تكوين الجانبية، مما أدى إلى المجهرية "العسل" التي تتألف من المجالات آل الغنية تحيط بها حدود في الغنية. ويتم تحقيق 18 القضاء على هذا المجهرية باستخدام درجة حرارة الركيزة حول 50 ° C فوق ظهور في الامتزاز، 15،19،20 أو ما يقرب من 630 درجة مئوية لمدة InAlN N-القطبية. في هذا النظام النمو ارتفاع في درجة الحرارة، وفي العاشر آل 1- تكوين س N هو وظيفة قوية لدرجة حرارة الركيزة، مع ارتفاع درجات الحرارة مما أدى إلى انخفاض في التأسيس. ويمكن زيادة تدفق في لتعويض وخسر أمام التبخر، على الرغم من ممارسة الحد الأقصى في تدفق محدودة بسبب انخفاض في كفاءة التأسيس مع زيادة في تدفق21 بالإضافة إلى خفض درجة حرارة الركيزة أو زيادة في تدفق وزيادة معدل النمو ويمكن أيضا أن يزيد من تكوين في يرجع ذلك إلى فخ "في دفن تأثير"، حيث ذرات آل الواردة في ومنعها من التبخر. 21،22 العالي معدلات النمو لا يمكن أن يتحقق من خلال زيادة في تدفق و آل نسبيا. للحفاظ على ظروف النمو N-الأغنياء، سيحتاج N * إلى زيادة أيضا، وهو ما يمكن أن يتحقق من خلال زيادة قوة الترددات اللاسلكية البلازما، وزيادة معدل تدفق N 2، وتحسين تصميم غرفة البلازما، أو زيادة حفرة لوحة الفتحة كثافة.
وتشمل طبقات الفوقي إضافية في HEMTs أساس InAlN-الجاليوم ون. interlayers (ILS) وقناة الجاليوم. ون. IL تدرج بين الحاجز وقناة يمكن أن تزيد μ التنقل وكذلك ورقة قناة كثافة الشحنة ن ق. وتعزى الزيادة في التنقل للحد من موجة الإلكترون وظيفة تداخل مع InAlN بarrier وسبائك نثر لاحق. 9 لضمان نمو عالية الجودة من ن. IL، يتم توفير فائض من الجا تدفق أثناء النمو ليكون بمثابة السطحي. والجاليوم IL يمكن استخدامها بين ن. IL وعائقا أمام زيادة تحسين التنقل في حين أن الحد تهمة القناة. يمكن زراعتها في قناة الجاليوم في نفس درجة حرارة حاجز InAlN، مما يتيح النمو المستمر من حاجز على الرغم من أن ILS والقناة. وقد تم الحصول على تحسين التنقل عن طريق قطع النمو بعد ن. IL وزيادة درجة حرارة النمو قبل نموا في قناة الجاليوم. في هذه الحالة لابد من الحفاظ خلال المقاطعة لمنع تدهور التنقل تغطية سطح جورجيا واقية.
ينطبق على بروتوكول التالية خصيصا لHEMTs InAlN من العوائق نمت على ركائز الجاليوم N-القطبية. ويمكن أن تمتد مباشرة إلى النمو على ركائز C-القطبي 4H- أو 6H-كربيد من قبل بما في ذلك نانومتر طبقة سميكة ن. ن الغنية 50.
Protocol
1. انصباب خلية التعلية والجريان المعايرة
- تأكيد السائل N 2 تتدفق إلى البرد والألواح، والتي وصلت الى غرفة النمو ضغط قاعدة.
- تكثيف الخلايا انصباب لقياس شعاع تدفق الخاصة بهم (BFM) درجة الحرارة بمعدل منحدر من 1 ° C / ثانية لجورجيا وفي الخلايا، و 10 ° C / دقيقة لقناة. انتظر 1 ساعة للخلايا لتحقيق الاستقرار حراريا.
- فتح مصراع كل خلية لمدة 30-60 ثانية، ثم قم بإغلاق مصراع لمدة 1-2 دقيقة. كرر ثلاث مرات لكل خلية. تجاهل أول شعاع تدفق قياس قياس أيون ومتوسط ثاني اثنين. ضبط درجة الحرارة خلية لتحقيق تدفق المطلوبة وفقا لمعايرة التدفق / درجة الحرارة السابقة.
2. إعداد الركيزة وتحميل
- السابق تنظيف الموقع الركيزة
- تحميل برنامج التحصين الموسع جاهزة N-القطبي الجاليوم ركائز مباشرة، من دون أي تنظيف خارج الموقع. إذا تعرضت الرقاقة في الهواء لأكثرمن بضع ساعات، وشطف تحت أسيتون (30 ثوان)، الأيسوبروبانول (30 ثوان) وغير المتأينة (DI) المياه (60 ثانية). ويفضل شطف إلى الانغماس عندما يكون ذلك ممكنا لأنه يميل إلى ترك الجسيمات أقل على سطح الرقاقة.
ملاحظة: للحصول على ركائز جا القطبي الجاليوم ويوصى سطح أكثر صرامة نظيفة 23
- تحميل برنامج التحصين الموسع جاهزة N-القطبي الجاليوم ركائز مباشرة، من دون أي تنظيف خارج الموقع. إذا تعرضت الرقاقة في الهواء لأكثرمن بضع ساعات، وشطف تحت أسيتون (30 ثوان)، الأيسوبروبانول (30 ثوان) وغير المتأينة (DI) المياه (60 ثانية). ويفضل شطف إلى الانغماس عندما يكون ذلك ممكنا لأنه يميل إلى ترك الجسيمات أقل على سطح الرقاقة.
- تحميل رقاقة
- إغلاق صمام بوابة عزلة الحمل قفل، وتنفيس مع N 2.
- تحميل الرقاقة على حامل والعودة الكاسيت إلى قفل الحمل. بدوره على مضخة التخشين تحميل قفل وفتح صمام مضخة التخشين وصمام المتعددة.
- عندما انخفض الضغط مشعب أقل من 0.1 عربة، إغلاق صمامات مضخة متعددة والتخشين. إيقاف ضخ التخشين وفتح تحميل قفل توربو مضخة العزلة صمام.
- السماح للقفل تحميل لضخ أسفل لمدة 30-60 دقيقة. من الناحية المثالية، واستخدام الضغط تحميل خصلة من 10 -6 -10 -7 عربة قبل ان ينتقل الى غرفة التحضير.
- فتح القفل الحمل في غرفة تحضير، ونقل الرقاقة إلى العربة باستخدام عصا تمايل. ثم استخدم عربة لنقل الرقاقة إلى محطة إطلاق الغازات في غرفة التحضير. نقل العربة يدويا على طول السكك الحديدية باستخدام feedthrough الروتاري على غرفة التحضير.
- Outgas رقاقة
- منحدر درجة حرارة سخان محطة إطلاق الغازات إلى 700 درجة مئوية خلال 10 دقيقة.
- بعد 30 دقيقة، منحدر درجة الحرارة تتراجع إلى 100 درجة مئوية. عندما تكون درجة الحرارة ≤ 250 درجة مئوية، ونقل الرقاقة إلى عربة باستخدام عصا تمايل في محطة إطلاق الغازات.
- تحميل رقاقة في غرفة النمو
- خفض مناور الركيزة لموقف الحمل، فتح إعداد / النمو بوابة غرفة صمام ونقل حامل الرقاقة إلى مناور.
- رفع مناور لموقف النمو، بالقرب من سخان الركيزة.
- إزالة العربة والبنودبيئة نظام تشغيل صمام البوابة.
- فتح N 2 زجاجة صمام، صمام منظم وإبرة العزلة صمام. تعيين تحكم تدفق كتلة (MFC) إلى 1.5 SCCM (أو حسب الحاجة للحصول على ضغط الغرفة من 3-4 × 10 -5 عربة). الضغط الأمثل للاشتعال البلازما هو بقوة تعتمد على نظام. لاحظ أن N 2 يجب أن تكون فائقة النقاء (أفضل ويفضل أن يكون من 6N) ويستخدم فلتر إضافي في خط لمزيد من خفض الشوائب.
- مع N * ومصاريع الرئيسية مغلقة، بدوره على امدادات الطاقة RF البلازما وحدة تحكم شبكة السيارات مطابقة. زيادة قوة الترددات اللاسلكية حتى يشعل البلازما.
- تعيين قوة الترددات اللاسلكية وتدفق N 2 لظروف عملية المطلوبة، في هذه الحالة 350 W و 2.0 SCCM. ن * تدفق الناتجة عن ظروف البلازما معين هو تعتمد على نظام، ولكن هنا، هذه الشروط العائد على معدل نمو الجاليوم من 5.0 نانومتر / دقيقة، أو N * تدفق 1.8 نانومتر -2 ثانية -1. مراقبة استقرار البلازما مع مطياف تعلق علىالنافذة الخلفية للغرفة البلازما.
- في إعداد السطح الموقعي: جا ترسب والامتزاز
- تكثيف سخان الركيزة إلى 10 درجة مئوية فوق درجة حرارة النمو الجاليوم المطلوب مع معدل المنحدر من ≤1 ° C / ثانية. في هذه الحالة، استخدم درجة حرارة رقاقة تقدر ب 730 درجة مئوية.
- تشغيل نظام RHEED لمراقبة تدهور سطح الرقاقة ورصد تغطية وجورجيا. تحويل يدويا على التناوب الركيزة. إعداد برنامج الحصول على RHEED أثار لجمع نمط RHEED مرة واحدة لكل دوران الركيزة لتوفير صورة ثابتة بينما الركيزة يدور أثناء النمو.
- فتح مصراع الركيزة والجا مصراع لمدة 1 دقيقة. ضمان كثافة RHEED تنخفض بعد ذلك تصل إلى الهضبة كما يتراكم جورجيا. وينبغي أن يكون الجا تدفق مماثلة لتلك المستخدمة للنمو الجاليوم. هنا، تدفق جا ما يقرب من 3.7 نانومتر -2 ثانية -1.
- إغلاق مصراع الكاميرا لمدة 2 دقيقة وضمان RHEEDزيادة كثافة ويبلغ عتبة قبل نهاية دقيقة 2، مشيرا إلى جورجيا الامتزاز.
- كرر الخطوات 2.5.2-2.5.4 ثلاث مرات، 24 ثم منحدر الركيزة لدرجة حرارة النمو الجاليوم.
النمو 3. HEMT
- نمو عازلة
- بدء النمو عن طريق فتح N * مصراع لنتردة 1 دقيقة.
- تنمو رقيقة 1-3 نانومتر-N غنية طبقة ن. التنوي عن طريق فتح قناة مصراع. هذه الطبقة ن. يمكن أن تساعد في منع الجيل خلع خيوط، 25 ومع ذلك، فإن طبقة ن. تعقيد حيود (XRD) قياسات X-ray و لا ينصح لعينات معايرة القائم على حيود الأشعة السينية. استخدام نفس آل تدفق أما بالنسبة للطبقة InAlN، أو حوالي 0.36 نانومتر -2 ثانية -1، مما يعطي معدل نمو يقرب من 1 نانومتر / دقيقة.
- إغلاق القاعدة وN * مصراع وعلى الفور فتح مصراع جورجيا لمدة 10 ثانية للسماح جورجيا لتشبع السطح، يجب أن كثافة RHEED يقلل راpidly. فتح N * مصراع (مع مصراع جورجيا لا تزال مفتوحة) وتنمو 5 دقائق من الجاليوم. استخدام كن أو C المنشطات، وخاصة بالنسبة قائما بذاته ركائز الجاليوم، لمنع تسرب التيارات الكهربائية في المخزن المؤقت.
- إغلاق مصاريع جورجيا وN * لانقطاع نمو 1 دقيقة. مراقبة كثافة RHEED. إذا كانت كثافة RHEED يزيد على الفور، ثم تدفق جورجيا ليست عالية بما فيه الكفاية. إذا يزيد من كثافة RHEED بعد> 30 ثانية أو لا تصل إلى الهضبة تقع ضمن نطاق 1 دقيقة ثم تدفق الجا مرتفع جدا. انظر الشكل 3.
- زيادة درجة حرارة الركيزة بضع درجات (أو تقليل جا درجة حرارة الخلايا انصباب) للتعويض عن تدفق الجا عالية ينظر في 3.1.4. إذا كان تدفق الجا منخفضة جدا، وانخفاض درجة حرارة الركيزة (أو زيادة جا درجة حرارة الخلايا انصباب) للتعويض.
- كرر الخطوات 3.1.3-3.1.5 حتى يكون هناك تأخير 15-30 ثانية قبل أن تزداد كثافة RHEED وكثافة RHEED تصل إلى الهضبة قبل 1 دقيقة.
- مواصلة تكرار الخطوات 3.1.4-3.1.5 حتى يتم الوصول إلى سمك الجاليوم المطلوب. تحديد سماكة بضرب الوقت نمو إجمالي معدل النمو معايرة. للنمو الجا الغنية، وتحديد معدل النمو من قبل N * تدفق، والتي يمكن بدورها أن تحسب باستخدام حيود الأشعة السينية لقياس سمك لفترة النمو المعروفة في عينة المعايرة نمت بشكل منفصل.
- نمو حاجز InAlN
- الانتظار لمدة 1 دقيقة إضافية بعد الخطوة نمو الجاليوم النهائية لضمان جميع الجا قد تبخرت.
- المنحدر بسرعة وصولا الى درجة حرارة النمو InAlN إلى حوالي 630 درجة مئوية. سماح للحرارة الركيزة لتحقيق الاستقرار لمدة 2 دقيقة.
- فتح في، القاعدة، وN * مصاريع. كثافة RHEED يجب أن تنخفض وتصل إلى الاستقرار في غضون 3 دقيقة الأولى. استمرار انخفاض كثافة RHEED قد يشير تراكم في، والتي تضر النمو InAlN. وينبغي أن يظل نمط RHEED معرق، مما يدل على سطح أملس. وأنان وتدفقات آل حوالي 0.31 و 0.36 نانومتر -2 ثانية -1، مما يعطي معدل نمو محدود مجموعة الثالثة من 1.25 نانومتر / دقيقة.
- إغلاق في، القاعدة، وN * تم التوصل إليه مصاريع بعد سماكة الحاجز المطلوب. للنمو N-الغنية، وتحديد معدل النمو في إجمالي تدفق جماعة الثالث. قياس معدل النمو باستخدام حيود الأشعة السينية على عينة المعايرة InAlN نمت بشكل منفصل. ل15 نانومتر InAlN حاجز باستخدام ظروف معينة هنا، فتح مصاريع لمدة 12 دقيقة و 30 ثانية.
- نمو البينية وقناة
- أولا فتح مصراع جورجيا لمدة 5 ثوان، ثم فتح N * مصراع وتنمو البينية الجاليوم. لا يزال ينبغي أن تكون درجة حرارة الركيزة في درجة حرارة النمو InAlN.
- فتح الله مصراع دون إغلاق جا أو N * مصاريع لزراعة البينية ن.. وينبغي أن يكون تدفق آل لالبينية نفسه أو أعلى قليلا من N * تدفق، من الناحية المثالية باستخدام مختلفة من الخلايا انصباب آل ثم أن تستخدم للطبقة حاجز InAlN، رس تجنب الاضطرار إلى تغيير درجة حرارة الخلية. راجع الخطوة 3.2.4.
- إغلاق N * ومصاريع آل لكن ترك مصراع الجا مفتوحة. منحدر درجة حرارة الركيزة لدرجة الحرارة قناة الجاليوم.
- بعد 30 ثانية إغلاق مصراع جورجيا. انتظر 30 ثانية (أو بمجرد بدء شدة RHEED لزيادة) وإعادة فتح مصراع جورجيا. تواصل دورة مصراع جورجيا حتى وصلت الركيزة درجة حرارة النمو قناة الجاليوم. هذا وسوف حماية السطح في حين منع تراكم الجا المفرط.
- فتح مصراع جورجيا لمدة 5 ثوان، ثم فتح N * مصراع وتنمو القناة الجاليوم.
- إغلاق جورجيا، N * ومصاريع الرئيسية. منحدر درجة حرارة الركيزة وصولا الى 200 درجة مئوية، وإيقاف N * البلازما واغلاق تدفق الغاز N 2.
- المنحدر الخلايا وصولا الى درجات حرارة الاستعداد إذا انتهت لهذا اليوم.
- انتظر درجة حرارة الركيزة لتقليل أقل من 250 درجة مئوية وضغط الغرفة لإسقاط أقل من 8 × 10 -7 عربة، ثمفتح صمام بوابة غرفة النمو ونقل حامل الرقاقة إلى العربة.
- اتبع العكس من الخطوة 2.2 لنقل الرقاقة إلى قفل الحمل، وتنفيس مع N 2 وإزالة الرقاقة. تأكد من إغلاق صمام بوابة غرفة النمو قبل فتح القفل الحمل، وأن الحمل قفل المضخة التوربينية بوابة صمام مغلق قبل التنفيس.
- اتبع خطوات 2.2.3-2.2.5 للعودة الكاسيت وتحميل القفل لفراغ عالية.
4. توصيف
- تميز نوعية المواد باستخدام المجهر الضوئي للتحقق من الحفر والشقوق أو جا قطرات ربما تكونت خلال نمو القناة، حيود الأشعة السينية لفحص جودة بينية وهيكل، وAFM للتحقق من مورفولوجيا السطح. 20،21
- إذا جا قطرات موجودة، تزج الرقاقة في حامض HF المركزة لمدة 5-10 دقيقة لإزالة قطرات دون الإضرار سطح N-القطبي حساسة كيميائيا.
- قياس الدقة ورقةistance باستخدام قياسات المقاومة تماس Lehighton.
- معالجة عينة للسماح توصيف الكهربائية، بما في ذلك القياسات قاعة وCTLM والعاصمة وRF الترانزستور التوصيف. 9،26
النتائج
حيود الأشعة السينية (XRD) بمسح InAlN الأغشية الرقيقة أظهرت نمت على ركائز الجاليوم N-القطبية في الشكل 4 (أ) واحد بلغ ذروته على حد سواء ل50 و الأفلام-200 نانومتر سميكة. الفحص حيود الأشعة السينية للنانومتر فيلم InAlN سميكة 50 يسلك Pendellösung هامش يصل الى 15 ت...
Discussion
نمو عالية الجودة طبقة عازلة الجاليوم أمر بالغ الأهمية لتحقيق ارتفاع التنقل الإلكترون في أي HEMT III-نيتريد. في حالة وجود InAlN HEMT N-القطبي، معقد نمو طبقة عازلة حسب المتطلبات التي يمكن إزالتها عن جورجيا من على سطح الأرض قبل أن النمو InAlN. وهناك مجموعة متنوعة من التقنيات لإنجاز...
Disclosures
The authors have nothing to disclose.
Acknowledgements
The authors thank Mr. Neil Green for assistance with sample preparation. This work was supported by the Office of Naval Research under funding from Dr. P. Maki. MTH was supported by a National Research Council Postdoctoral Fellowship.
Materials
| Name | Company | Catalog Number | Comments |
| Freestanding N-polar GaN wafer | Kyma | 10 mm x 10 mm | |
| C-polar SiC wafer | Cree | W4TRE0R-L600 | 3 inch diameter |
| Microelectronics grade acetone | Fischer Scientific | A18-4 | |
| Microelectronics grade isoproponal | J.T. Baker | 9079-05/JT9079-5 | |
| Al source material (6N5 pure) | UMC | ALR62060I | |
| Ga source material (7N pure) | UMC | GA701 | |
| In source material (7N pure) | UMC | IN750 | |
| ULSI N2 source gas (6N pure) | Matheson Tri-gas | G2659906D | |
| PRO-75 MBE system | OmicronScientia |
References
- Hughes, W. C., et al. Molecular beam epitaxy growth and properties of GaN films on GaN/SiC substrates. J. Vac. Sci. Technol., B. 13 (4), 1571-1577 (1995).
- McSkimming, B. M., Wu, F., Huault, T., Chaix, C., Speck, J. S. Plasma assisted molecular beam epitaxy of GaN with growth rates 2.6 µm/hr. J. Cryst. Growth. 386, 168-174 (2014).
- Grandjean, N., Massies, J., Leroux, M. Nitridation of sapphire. Effect on the optical properties of GaN epitaxial overlayers. Appl. Phys. Lett. 69 (14), 2071-2073 (1996).
- Corrion, A. L., Wu, F., Speck, J. S. Growth regimes during homoepitaxial growth of GaN by ammonia molecular beam epitaxy. J. Appl. Phys. 112 (5), 054903 (2012).
- Mazumder, B., et al. Atom probe analysis of AlN interlayers in AlGaN/AlN/GaN heterostructures. Appl. Phys. Lett. 102 (11), 111603 (2013).
- Feezell, D. F., Speck, J. S., DenBaars, S. P., Nakamura, S. Semipolar (2021) InGaN/GaN Light-Emitting Diodes for High-Efficiency Solid State Lighting. J. Disp. Technol. 9 (4), (2013).
- Hardy, M. T., et al. True Green Semipolar InGaN-Based Laser Diodes Beyond Critical Thickness Limits Using Limited Area Epitaxy. J. Appl. Phys. 114 (18), 183101 (2013).
- Wong, M. H., et al. N-polar GaN epitaxy and high electron mobility transistors. Semicond. Sci. Technol. 28 (7), 074009 (2013).
- Hardy, M. T., et al. Charge control in N-polar InAlN high-electron-mobility transistors grown by plasma-assisted molecular beam epitaxy. J. Vac. Sci. Technol., B. 33 (6), 061207 (2015).
- Piquette, E. C., Bridger, P. M., Beach, R. A., McGill, T. C. Effect of Buffer Layer and III/V Ratio on the Surface Morphology of GaN Grown by MBE. Symposium G '-' GaN and Related Alloys. , (1998).
- Tarsa, E. J., et al. Homoepitaxial growth of GaN under Ga-stable and N-stable conditions by plasma-assisted molecular beam epitaxy. J. Appl. Phys. 82 (11), 5472-5479 (1997).
- Kuzmik, J. Power electronics on InAlN/(In)GaN: Prospect for a record performance. IEEE Electron Device Lett. 22 (11), 510-512 (2001).
- Fernández-Garrido, S., Gačević, &. #. 3. 8. 1. ;., Calleja, E. A comprehensive diagram to grow InAlN alloys by plasma-assisted molecular beam epitaxy. Appl. Phys. Lett. 93 (19), 191907 (2008).
- Katzer, D. S., et al. Molecular beam epitaxy of InAlN∕GaN heterostructures for high electron mobility transistors. J. Vac. Sci. Technol., B. 23 (3), 1204-1208 (2005).
- Kaun, S. W., et al. GaN-based high-electron-mobility transistor structures with homogeneous lattice-matched InAlN barriers grown by plasma-assisted molecular beam epitaxy. Semicond. Sci. Technol. 29 (4), 045011 (2014).
- Hoke, W. E., Torabi, A., Mosca, J. J., Kennedy, T. D. Thermodynamic analysis of cation incorporation during molecular beam epitaxy of nitride films using metal-rich growth conditions. J. Vac. Sci. Technol., B. 25 (3), 978-982 (2007).
- Koblmüller, G., Reurings, F., Tuomisto, F., Speck, J. S. Influence of Ga/N ratio on morphology, vacancies, and electrical transport in GaN grown by molecular beam epitaxy at high temperature. Appl. Phys. Lett. 97 (19), 191915 (2010).
- Zhou, L., Smith, D. J., McCartney, M. R., Katzer, D. S., Storm, D. F. Observation of vertical honeycomb structure in InAlN∕GaN heterostructures due to lateral phase separation. Appl. Phys. Lett. 90 (8), 081917 (2007).
- Ahmadi, E., et al. Elimination of columnar microstructure in N-face InAlN, lattice-matched to GaN, grown by plasma-assisted molecular beam epitaxy in the N-rich regime. Appl. Phys. Lett. 104 (7), 072107 (2014).
- Hardy, M. T., et al. Morphological and microstructural stability of N-polar InAlN thin films grown on free-standing GaN substrates by molecular beam epitaxy. J. Vac. Sci. Technol., A. 34 (2), 021512 (2016).
- Hardy, M. T., et al. Indium incorporation dynamics in N-polar InAlN thin films grown by plasma-assisted molecular beam epitaxy on freestanding GaN substrates. J. Cryst. Growth. 245, (2015).
- Leszczynski, M., et al. Indium incorporation into InGaN and InAlN layers grown by metalorganic vapor phase epitaxy. J. Cryst. Growth. 318 (1), 496-499 (2011).
- Storm, D. F., et al. Ultrathin-barrier AlN/GaN heterostructures grown by rf plasma-assisted molecular beam epitaxy on freestanding GaN substrates. J. Cryst. Growth. 380, 14-17 (2013).
- Storm, D. F., Katzer, D. S., Meyer, D. J., Binari, S. C. Oxygen incorporation in homoepitaxial N-polar GaN grown by radio frequency-plasma assisted molecular beam epitaxy: Mitigation and modeling. J. Appl. Phys. 112 (1), 013507 (2012).
- Storm, D. F., et al. Effect of interfacial oxygen on the microstructure of MBE-grown homoepitaxial N-polar. J. Cryst. Growth. 409, 14 (2014).
- Meyer, D. J., et al. High Electron Velocity Submicrometer AlN/GaN MOS-HEMTs on Freestanding GaN Substrates. IEEE Electron Device Lett. 34, 199 (2013).
- Moseley, M., Billingsley, D., Henderson, W., Trybus, E., Doolittle, W. A. Transient atomic behavior and surface kinetics of GaN. J. Appl. Phys. 106 (1), 014905 (2009).
- Koblmüller, G., et al. Ga Adlayer Governed Surface Defect Evolution of (0001)GaN Films Grown by Plasma-Assisted Molecular Beam Epitaxy. Jpn. J. Appl. Phys. 44 (28), L906-L908 (2005).
- Poblenz, C., Waltereit, P., Speck, J. S. Uniformity and control of surface morphology during growth of GaN by molecular beam epitaxy. J. Vac. Sci. Technol., B. 23 (4), 1379-1385 (2005).
Reprints and Permissions
Request permission to reuse the text or figures of this JoVE article
Request PermissionExplore More Articles
This article has been published
Video Coming Soon
Copyright © 2025 MyJoVE Corporation. All rights reserved