Для просмотра этого контента требуется подписка на Jove Войдите в систему или начните бесплатную пробную версию.
Method Article
С помощью плазмы молекулярно-лучевой эпитаксии N-полярная InAlN-барьерные Транзисторы высокого электронно-мобильности
В этой статье
Резюме
Молекулярно-лучевой эпитаксии используется для расти N-полярные транзисторы InAlN барьер высокой подвижности электронов (HEMTs). Контроль подготовки пластин, условий роста слоя и структура эпитаксиальных приводит к гладкой, композиционно однородных слоев InAlN и HEMTs с подвижностью достигает 1,750 см 2 / В ∙ сек.
Аннотация
молекулярно-лучевой эпитаксии с помощью плазмы хорошо подходит для эпитаксиального роста III-нитридных тонких пленок и гетероструктур с гладкими, крутыми интерфейсами, необходимых для высококачественных транзисторов высокой электронной подвижностью (HEMTs). Процедура представлена для роста N-полярных InAlN HEMTs, включая подготовку пластин и роста буферных слоев, InAlN барьерный слой, AlN и GaN прослоек и канала GaN. Критические проблемы на каждом этапе этого процесса определены, такие, как избежать накопления Ga в буфере GaN, роль температуры на InAlN композиционной однородностью и использование потока Ga во время AlN промежуточного слоя, а прерывание роста канала до ГАН. Композиционно однородная N-полярная InAlN тонкие пленки демонстрируются с поверхности корня среднеквадратической шероховатости как низко как 0,19 нм и InAlN на основе HEMT структуры сообщили, что подвижность столь же высоко как 1.750 см 2 / В ∙ сек для устройств с плотностью листа заряда 1,7 х 1013 см -2.
Введение
Молекулярно - лучевой эпитаксии (MBE) является универсальным эпитаксиальных тонкопленочных метод роста , который использует сверхвысокого вакуумной среде с базовым давлением ниже 10 -11 мм рт.ст. , чтобы обеспечить включение с низким содержанием примесей в выращенной пленки. Состав и скорость роста из эпитаксиально выращенных слоев определяются путем регулирования температуры каждой Эффузионным клетки, и, таким образом Испарившаяся поток различных исходных материалов. В случае III-нитридного эпитаксии группы III-элементы (In, Al, Ga) , как правило , представленной эффузионных клетками в то время как активный азот (N *) поток обеспечивается либо с N 2 в плазме 1,2 (RF плазмы -поддерживаемая MBE:. PAMBE или RFMBE) или аммиака (NH 3 -MBE) 3,4 рост MBE характеризуется более низкими температурами роста и более резкой границе раздела фаз резкостью по сравнению с другими методами эпитаксиального роста, таких как МОС химического осаждения из паровой фазы 5 Схема показана. на рисунке 1.
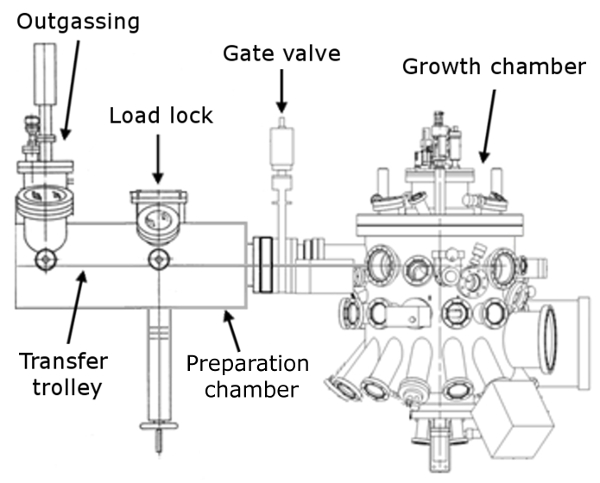
Рисунок 1:.. Система MBE схематичное Схематическое изображение шлюзовой камеры нагрузки, системы передачи, дегазация станции и роста Пожалуйста , нажмите здесь , чтобы посмотреть увеличенную версию этой фигуры.
III-нитриды могут быть выращены на подложках, имеющих различные ориентации кристалла. Чаще всего используется ориентация Ga-полярный с -плоскость, что позволяет формирование двумерного электронного газа без легирования за счет использования разницы в поляризации между барьерным слоем, обычно AlGaN и канала GaN. Различные неполярный и полуполярные ориентации GaN получили значительное внимание для оптоэлектроники из - за уменьшения поляризационных эффектов в квантовых ямах, 6,7 , который также делает эти ориентации менее желательным для HEMT аппликацийнс. N-полярные ориентированные устройства являются привлекательными для высокочастотной работы HEMT следующего поколения из - за нескольких собственных преимуществ по сравнению с обычными Ga-полярными устройств. 8 Барьерный слой в N-полярными устройств выращивают под каналом GaN , как показано на рисунке 2, в результате чего в естественной задней барьер, который помогает электростатический контроль канала и уменьшает эффекты коротких каналов, позволяя при этом более легкий текущий доступ к каналу GaN и снижения сопротивления контакта. Барьер также можно управлять отдельно от канала, так что, как толщина канала масштабируется вниз для высокочастотных устройств конструкция барьера может быть изменен, чтобы компенсировать канала заряда потерянной к Ферми уровня эффектов пиннинга.
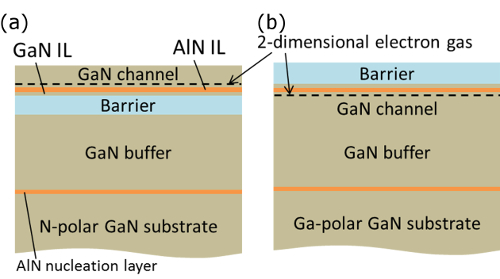
Рис . 2: эпитаксиальный слой схематичное слой структура (а) N-полярную HEMT и (б) Ga-полярной HEMT для COMPARисоном. Пожалуйста , нажмите здесь , чтобы посмотреть увеличенную версию этой фигуры.
HEMTs, используемые в высокоскоростных, высокой усилители мощности, как правило, выращивают на SiC-подложках, чтобы воспользоваться преимуществами высокой теплопроводности SiC. Низкие плотности пронизывающих дислокаций Freestanding GaN подложки могут быть использованы для улучшения подвижности электронов, 9 тем самым улучшая производительность высокой частоты. После роста в AlN зародышевого слоя, толстый буфер GaN выращивают пространственное разделение примесей на границе раздела подроста из канала HEMT и улучшить электрическую изоляцию. В отличие от других III-V материалов, GaN , выращенных с помощью PAMBE обычно требует условий роста при соотношении III группы / V больше 1, т.е. богатых металлами условиях, 10,11 , с тем , чтобы достичь гладкой морфологией поверхности. В х Al 1- х N является альтернативный барьерный материал для III-нитридных HEMTs, и получила значительное внимание в последнее время, так как оно может быть выращено решетка согласована с GaN при х ≈ 0,18 и может генерировать более чем вдвое превышает заряда канала относительно AlGaN барьеров из - за его высокой спонтанной поляризации. В отличие от 12-15 AlGaN барьеры, Ga будет включать в себя преимущественно с In в InAlN слоях, 16 , таким образом , необходимо позаботиться , чтобы обеспечить поверхность свободна от избытка Ga после Ga-богатого роста слоя GaN буфера и до роста InAlN.
Контроль Ga на поверхности может быть достигнуто с помощью питающих поток Ga немного меньше потока, необходимого для образования Ga-капельным. Тем не менее, это окно роста мал, и недостаточный охват поверхности Ga вызывает морфологию поверхности деградировать в плато / позиционной морфологии в то время как избыточный поток Ga приводит к накоплению Ga и образованию макроскопического капельным. 17 Отражение высоких энергий электронов дифракции (ДБЭО) INTENS ности могут быть использованы для мониторинга накопления Ga и десорбцию. Покрытие поверхности Ga обозначено уменьшением интенсивности ДБЭО, и любой лага между закрытием Ga (и N *) жалюзи и начальное увеличение интенсивности ДБЭО указывает на накопление Ga, как показано на рисунке 3.

Рисунок 3: Мониторинг покрытия Ga с интенсивности сигнала ДБЭО интенсивности ДБЭО , измеренная от ДБЭО приобретенного при повороте с помощью сработавшей приобретения.. Недостаточный поток Ga обозначается немедленным увеличением интенсивности после закрытия дверцы (не показана). Насыщенный / идеальное покрытие Ga указывается задержка между закрытием затвора и резким ДБЭО осветления и избыточного покрытия Ga в рассматривалось и как задержки в начальной ДБЭО осветления, а также более постепенным увеличением интенсивности, что приводит к полному восстановлению интенсивности занимает больше времени, чем 60 сек.COM / файлы / ftp_upload / 54775 / 54775fig3large.jpg "целевых =" _blank "> Пожалуйста, нажмите здесь, чтобы посмотреть увеличенную версию этой фигуры.
Достижение высокого качества InAlN путем PAMBE осложняется наличием боковых колебаний состава, в результате чего "сотами" микроструктуры , состоящей из Al-богатых областей , окруженных В богатых границах. 18 Устранение этой микроструктуры достигается за счет использования температуры подложки около 50 ° C выше начала десорбции, 15,19,20 или приблизительно 630 ° C для N-полярных InAlN. В этом режиме роста при высоких температурах, то в х Al 1- х N композиция сильно зависит от температуры подложки, при более высоких температурах приводит к ниже инкорпорации. Поток В может быть увеличена, чтобы компенсировать в потерянной испарению, хотя на практике максимальный Флюсом ограничивается снижением эффективности инкорпорации первую очередь с увеличением потока. 21 В дополнение к снижению температуры подложки или увеличение в потоке, увеличивая скорость роста может также увеличить состав в связи с "В похоронив эффект", где входящие Al захватывать атомы В и не допустить его испарения. 21,22 Высшее темпы роста могут быть достигнуты за счет увеличения потока в Al и пропорционально. Для того, чтобы сохранить условия роста N-богатых, N * должны были бы быть увеличена , а также, что может быть достигнуто за счет увеличения мощности ВЧ плазмы, увеличивая скорость потока N 2, совершенствование конструкции плазменной камеры, или увеличение диафрагмы отверстие пластины плотность.
Дополнительные слои эпитаксиальных в HEMTs InAlN основе включают GaN и AlN прослоек (ILS) и канал GaN. AlN IL вставляется между барьером и каналом может увеличить подвижность ц, а также канал листа плотности заряда н с. Увеличение подвижности приписывается к уменьшению электронной волновой функции перекрытия с InAlN Ьarrier и последующего рассеяния сплава. 9 Для обеспечения высококачественного роста из AlN IL, избыток потока Ga подается во время роста , чтобы действовать в качестве поверхностно -активного вещества. GaN IL может быть использован между AlN IL и барьером для дальнейшего повышения мобильности при одновременном снижении заряда канала. Канал GaN может быть выращен при той же температуре, что и барьер InAlN, позволяя непрерывный рост от барьера хотя ИЛС и канала. Улучшение подвижности была получена путем прерывания роста после AlN IL и повышение температуры роста перед выращиванием канала GaN. В этом случае защитное покрытие поверхности Ga должна поддерживаться во время прерывания для предотвращения ухудшения подвижности.
Следующий протокол применяется специально для InAlN барьера HEMTs, выращенных на N-полярных GaN субстратов. Он может быть непосредственно продлен до роста на С-полярная 4Н- или 6H-SiC подложках, включая толщиной 50 нм N-богатый AlN слой.
протокол
1. Effusion Cell Ramp и Flux калибровки
- Confirm жидкость N 2 течет к крио-панелей и что камера рост достиг базового давления.
- Нарастить выпота клетки к их измерению потока света (BFM) температуры при скорости нагрева 1 ° С / сек для Ga и в клетках, и 10 ° С / мин для Al. Подождите 1 час для клеток, чтобы стабилизировать температурный режим.
- Откройте затвор каждой ячейки в течение 30-60 сек, а затем закрыть затвор в течение 1-2 мин. Повторите три раза для каждой ячейки. Выбросьте первый поток света измерение ионного датчика и в среднем вторые две. Регулировка температуры электролизера для достижения желаемого потока в соответствии с предыдущими калибровками потока / температуры.
2. Подготовка основания и загрузка
- Пример очистки Ситу субстрат
- Нагрузка эпи-готовый N-полярная GaN подложки непосредственно, без какой - либо очистки на месте бывшей. Если пластина подверглась воздействию воздуха в течение болеечем на несколько часов, промыть под ацетоном (30 сек), изопропилового спирта (30 сек) и деионизованной (DI) воды (60 сек). Промывание предпочтительно погружение, когда это возможно, как это имеет тенденцию оставлять меньше частиц на поверхности пластины.
Примечание:. Для Ga-полярной подложках GaN более строгая поверхность чистой рекомендуется 23
- Нагрузка эпи-готовый N-полярная GaN подложки непосредственно, без какой - либо очистки на месте бывшей. Если пластина подверглась воздействию воздуха в течение болеечем на несколько часов, промыть под ацетоном (30 сек), изопропилового спирта (30 сек) и деионизованной (DI) воды (60 сек). Промывание предпочтительно погружение, когда это возможно, как это имеет тенденцию оставлять меньше частиц на поверхности пластины.
- Загрузка пластины
- Закройте нагрузки замок изоляции задвижки, и вентиляционное отверстие с N 2.
- Загрузите пластину на держателе и вернуть кассету к замку нагрузки. Включите обжимного насоса блокировки нагрузки и открыть черновая клапан насоса и клапана коллектора.
- Когда давление в коллекторе упадет ниже 0,1 мм рт.ст., закройте многообразные и черновые клапаны насоса. Выключите черновую насос и открыть изолирующий турбонасос клапан нагрузки блокировки.
- Разрешить блокировки нагрузки на откачку в течение 30-60 мин. В идеале, используйте давление блокировки нагрузки 10 -6 -10 -7 мм рт.ст. перед передачей подготовки камеры.
- Открыть замок нагрузки в подготовку камеры, а также передавать пластины к тележке с помощью качаний палку. Затем с помощью тележки для передачи пластины на обезгажен- станции в подготовительной камере. Перемещение тележки вручную вдоль рельса с помощью роторного проходных на подготовительной камере.
- дегазация пластины
- Рампа температуру нагревателя газовыделение станции до 700 ° С в течение 10 мин.
- Через 30 мин, рампа температуру обратно до 100 ° С. Когда температура ≤ 250 ° C, передавать пластины обратно к тележке с помощью вобуляции палки в обезгажен- станции.
- Загрузка пластин в камеру роста
- Опустите манипулятором подложки в положение нагрузки, открыть камеру задвижку подготовки / роста и передачи держатель пластины к манипулятору.
- Поднимите манипулятором на позицию роста, вблизи нагревателя подложки.
- Снимите тележку и слOSE задвижке.
- Откройте клапан N 2 бутылки клапан, регулирующий клапан и изоляция иглы. Установите регулятор массового расхода (MFC) до 1,5 кубических сантиметров в минуту (или по мере необходимости , чтобы получить давление в камере 3-4 × 10 -5 мм рт.ст.). Оптимальное давление для плазменного воспламенения сильно зависит от системы. Следует отметить , что N 2 должен быть сверхвысокой чистоты (предпочтительно лучше , чем 6N) и дополнительный фильтр используется в линии для дальнейшего снижения примесей.
- С N * и основные ставни закрыты, включите плазменный РЧ источник питания и сетевой контроллер автоматического согласования. Увеличение мощности РЧ, пока плазма не воспламеняется.
- Установите ВЧ мощности и N 2 потока до желаемых условий процесса, в данном случае 350 Вт и 2.0 SCCM. N * поток в результате данных условиях плазмы зависит от системы, но здесь, эти условия дают скорость роста GaN от 5,0 нм / мин, или N * поток 1,8 нм -2 с -1. Монитор стабильности плазмы с помощью спектрометра, прикрепленной кзаднее стекло плазменной камеры.
- В месте подготовки поверхности: осаждения Ga и десорбции
- Нарастить нагреватель подложки до 10 ° C выше желаемой температуры роста GaN, со скоростью рампы ≤1 ° С / с. В этом случае использовать расчетную температуру пластины 730 ° С.
- Включите систему ДБЭО, чтобы наблюдать за деградации поверхности пластины и контролировать покрытие Ga. Вручную включите вращение подложки. Настройка программного обеспечения сбора срабатывает RHEED собрать образец RHEED один раз за вращения подложки, чтобы обеспечить статическое изображение в то время как подложка вращается во время роста.
- Открыть затвор подложки и Ga затвора в течение 1 мин. Убедитесь, что интенсивность ДБЭО уменьшается затем достигает плато, как накапливается Ga. Ga поток должен быть аналогичен тому, который используется для роста GaN. Здесь поток Ga приблизительно, 3,7 нм -2 сек -1.
- Закройте затвор в течение 2 мин и обеспечить ДБЭОинтенсивность возрастает и достигает плато до конца 2 мин, что указывает на Ga десорбции.
- Повторите шаги 2.5.2-2.5.4 три раза, 24 и затем сползать субстрата до температуры роста GaN.
Рост 3. НЕМТ
- рост буфера
- Инициировать рост путем открытия N * затвор за 1 мин азотирования а.
- Grow тонкий 1-3 нм N богатых AlN зародышевого слоя, открыв затвор Al. Этот слой AlN может помочь предотвратить потоковую генерацию дислокаций, 25 однако, AlN слой усложняет дифракционные измерения (РСА) рентгеновских лучей и не рекомендуется для РФА на основе калибровочных образцов. Используйте один и тот же поток , как Al для слоя InAlN, или около 0,36 нм -2 с -1, что дает скорость роста примерно 1 нм / мин.
- Закройте Al и N * затвор и немедленно открыть затвор Ga в течение 10 сек, чтобы позволить Ga насытить поверхность, интенсивность ДБЭО ра должна уменьшатьсяpidly. Откройте N * затвор (с затвором Ga еще открыт) и растут 5 мин ГАН. Использование Be или С допингом, особенно для отдельно стоящих GaN субстратов, для предотвращения электрических токов утечки в буфере.
- Закройте ставни Ga и N * для прерывания роста в 1 мин. Монитор интенсивности RHEED. Если интенсивность ДБЭО сразу возрастает, то поток Ga недостаточно высока. Если интенсивность ДБЭО увеличивается после того, как> 30 сек или не достигает плато в течение 1 мин, после чего поток Ga слишком высока. Смотрите рисунок 3.
- Повышение температуры подложки на несколько градусов (или уменьшить температуру выпот клеток Ga) для компенсации высокого потока Ga видели в 3.1.4. Если поток Ga была слишком низкой, уменьшают температуру подложки (или увеличить температуру выпот клеток Ga), чтобы компенсировать.
- Повторите шаги 3.1.3-3.1.5, пока не будет задержка 15-30 сек до того, как интенсивность увеличивается ДБЭО и интенсивность ДБЭО достигает плато до 1 мин.
- Продолжайте повторять шаги 3.1.4-3.1.5 до желаемой толщины GaN не будет достигнута. Определить толщину путем умножения общего времени роста калиброванным темпов роста. Для Ga-богатых роста, определяют скорость роста к N * потока, который в свою очередь может быть вычислена с использованием XRD для измерения толщины для известного времени роста в отдельно выращенного калибровочного образца.
- Рост InAlN барьера
- Подождите еще 1 мин после того, как на конечной стадии роста GaN, чтобы гарантировать, что все Ga испарилась.
- Быстро сползать вниз до температуры роста InAlN до примерно 630 ° С. Разрешить температура подложки для стабилизации в течение приблизительно 2 мин.
- Откройте In, Al, и N * ставни. Интенсивность ДБЭО должна уменьшаться и достигают плато в течение первых 3 мин. Продолжение уменьшение интенсивности ДБЭО может указывать на накопление в, что является вредным для роста InAlN. Шаблон ДБЭО должен оставаться прослойками, что указывает на гладкую поверхность. Яп и Al потоки около 0,31 и 0,36 нм -2 с -1, что дает группу III ограниченную скорость роста 1,25 нм / мин.
- Закрыть В, Al, и N * жалюзи после желаемой толщины барьера было достигнуто. Для N-богатого роста, определяют скорость роста суммарного потока III группы. Измерение скорости роста, используя XRD на отдельно выращенных InAlN калибровочного образца. Для 15 нм InAlN барьера, используя условия, приведенные здесь, открыть ставни в течение 12 мин 30 сек.
- Рост Прослойка и канала
- Сначала откройте затвор Ga в течение 5 секунд, затем откройте N * затвор и расти ГАН прослойку. Температура подложки должна быть по-прежнему при температуре роста InAlN.
- Откройте затвор Al без закрытия Ga или N * ставни, чтобы вырастить AlN промежуточного слоя. Поток Al для промежуточного слоя должна быть такой же или несколько выше, чем N * потока, в идеале с использованием другого Al выпот клетки затем, что используется для барьерного слоя InAlN, тO избежать необходимости изменения температуры ячейки. См шаг 3.2.4.
- Закройте N * и Al ставни, но оставить затвор открытым Ga. Рампа температуру подложки до температуры канала GaN.
- Через 30 секунд закрыть затвор Ga. Подождите 30 секунд (или как только интенсивность ДБЭО начинает возрастать) и повторно открыть затвор Ga. Продолжайте цикл затвора Ga до тех пор, пока субстрат не достигнет температуры роста канала GaN. Это защитит поверхность, предотвращая чрезмерное накопление Ga.
- Открыть затвор Ga в течение 5 секунд, затем откройте N * затвор и расти канал GaN.
- Закройте Ga, N * и главные ставни. Рампа температуру подложки до 200 ° C, выключите N * плазму и перекрывать поток N 2 газа.
- Рампа клеток вплоть до их ожидания, если температура закончена в течение дня.
- Дождитесь от температуры подложки , чтобы уменьшить ниже 250 ° С , и давление в камере опускается ниже 8 × 10 -7 мм рт.ст., а затемоткрыть задвижку камеры роста и передать держатель пластины обратно в тележку.
- Следуйте реверс Шаг 2.2 перевести пластину обратно в замок нагрузки, вентиляционное отверстие с N 2 и снимите пластину. Убедитесь, что задвижка ростовой камеры закрывается перед открытием замка нагрузки, и что блокировка нагрузки Задвижка турбонасос закрывается до вентиляции.
- Выполните шаги 2.2.3-2.2.5, чтобы вернуть кассету и нагрузки замок высокого вакуума.
4. Характеристика
- Охарактеризуйте качество материалов с помощью оптической микроскопии , чтобы проверить наличие ям, трещин или Ga-капель , которые могли образоваться в процессе роста канала, XRD для проверки на границе раздела фаз и структура качества, и AFM , чтобы проверить морфологию поверхности. 20,21
- Если Ga-капли присутствуют, погрузить пластины в концентрированной фтористоводородной кислоты в течение 5-10 мин для удаления капель, не повреждая химически чувствительный N-полярную поверхность.
- Мера листа Резistance с помощью измерения сопротивления бесконтактным Лейтон.
- Процесс образца для обеспечения электрических характеристик, в том числе зал и CTLM измерений и постоянного тока и ВЧ транзистора характеристики. 9,26
Результаты
Рентгеновской дифракции (XRD) сканирование InAlN тонких пленок , показанных выращенных на N-полярных GaN субстратов на рисунке 4 (а) однобортные достигла своего пика и для 50 и 200 нм толстых пленок. Рентгенограмма сканирование толщиной 50 нм InAlN пленка проявляет Pendelosung -...
Обсуждение
Рост в GaN буферного слоя высокого качества имеет решающее значение для достижения высокой подвижности электронов в любом III-нитридного HEMT. В случае N-полярную InAlN HEMT, рост буферного слоя осложняется требованием, чтобы все Ga быть удалены от поверхности до роста InAlN. Есть различные методы д...
Раскрытие информации
The authors have nothing to disclose.
Благодарности
The authors thank Mr. Neil Green for assistance with sample preparation. This work was supported by the Office of Naval Research under funding from Dr. P. Maki. MTH was supported by a National Research Council Postdoctoral Fellowship.
Материалы
| Name | Company | Catalog Number | Comments |
| Freestanding N-polar GaN wafer | Kyma | 10 mm x 10 mm | |
| C-polar SiC wafer | Cree | W4TRE0R-L600 | 3 inch diameter |
| Microelectronics grade acetone | Fischer Scientific | A18-4 | |
| Microelectronics grade isoproponal | J.T. Baker | 9079-05/JT9079-5 | |
| Al source material (6N5 pure) | UMC | ALR62060I | |
| Ga source material (7N pure) | UMC | GA701 | |
| In source material (7N pure) | UMC | IN750 | |
| ULSI N2 source gas (6N pure) | Matheson Tri-gas | G2659906D | |
| PRO-75 MBE system | OmicronScientia |
Ссылки
- Hughes, W. C., et al. Molecular beam epitaxy growth and properties of GaN films on GaN/SiC substrates. J. Vac. Sci. Technol., B. 13 (4), 1571-1577 (1995).
- McSkimming, B. M., Wu, F., Huault, T., Chaix, C., Speck, J. S. Plasma assisted molecular beam epitaxy of GaN with growth rates 2.6 µm/hr. J. Cryst. Growth. 386, 168-174 (2014).
- Grandjean, N., Massies, J., Leroux, M. Nitridation of sapphire. Effect on the optical properties of GaN epitaxial overlayers. Appl. Phys. Lett. 69 (14), 2071-2073 (1996).
- Corrion, A. L., Wu, F., Speck, J. S. Growth regimes during homoepitaxial growth of GaN by ammonia molecular beam epitaxy. J. Appl. Phys. 112 (5), 054903 (2012).
- Mazumder, B., et al. Atom probe analysis of AlN interlayers in AlGaN/AlN/GaN heterostructures. Appl. Phys. Lett. 102 (11), 111603 (2013).
- Feezell, D. F., Speck, J. S., DenBaars, S. P., Nakamura, S. Semipolar (2021) InGaN/GaN Light-Emitting Diodes for High-Efficiency Solid State Lighting. J. Disp. Technol. 9 (4), (2013).
- Hardy, M. T., et al. True Green Semipolar InGaN-Based Laser Diodes Beyond Critical Thickness Limits Using Limited Area Epitaxy. J. Appl. Phys. 114 (18), 183101 (2013).
- Wong, M. H., et al. N-polar GaN epitaxy and high electron mobility transistors. Semicond. Sci. Technol. 28 (7), 074009 (2013).
- Hardy, M. T., et al. Charge control in N-polar InAlN high-electron-mobility transistors grown by plasma-assisted molecular beam epitaxy. J. Vac. Sci. Technol., B. 33 (6), 061207 (2015).
- Piquette, E. C., Bridger, P. M., Beach, R. A., McGill, T. C. Effect of Buffer Layer and III/V Ratio on the Surface Morphology of GaN Grown by MBE. Symposium G '-' GaN and Related Alloys. , (1998).
- Tarsa, E. J., et al. Homoepitaxial growth of GaN under Ga-stable and N-stable conditions by plasma-assisted molecular beam epitaxy. J. Appl. Phys. 82 (11), 5472-5479 (1997).
- Kuzmik, J. Power electronics on InAlN/(In)GaN: Prospect for a record performance. IEEE Electron Device Lett. 22 (11), 510-512 (2001).
- Fernández-Garrido, S., Gačević, &. #. 3. 8. 1. ;., Calleja, E. A comprehensive diagram to grow InAlN alloys by plasma-assisted molecular beam epitaxy. Appl. Phys. Lett. 93 (19), 191907 (2008).
- Katzer, D. S., et al. Molecular beam epitaxy of InAlN∕GaN heterostructures for high electron mobility transistors. J. Vac. Sci. Technol., B. 23 (3), 1204-1208 (2005).
- Kaun, S. W., et al. GaN-based high-electron-mobility transistor structures with homogeneous lattice-matched InAlN barriers grown by plasma-assisted molecular beam epitaxy. Semicond. Sci. Technol. 29 (4), 045011 (2014).
- Hoke, W. E., Torabi, A., Mosca, J. J., Kennedy, T. D. Thermodynamic analysis of cation incorporation during molecular beam epitaxy of nitride films using metal-rich growth conditions. J. Vac. Sci. Technol., B. 25 (3), 978-982 (2007).
- Koblmüller, G., Reurings, F., Tuomisto, F., Speck, J. S. Influence of Ga/N ratio on morphology, vacancies, and electrical transport in GaN grown by molecular beam epitaxy at high temperature. Appl. Phys. Lett. 97 (19), 191915 (2010).
- Zhou, L., Smith, D. J., McCartney, M. R., Katzer, D. S., Storm, D. F. Observation of vertical honeycomb structure in InAlN∕GaN heterostructures due to lateral phase separation. Appl. Phys. Lett. 90 (8), 081917 (2007).
- Ahmadi, E., et al. Elimination of columnar microstructure in N-face InAlN, lattice-matched to GaN, grown by plasma-assisted molecular beam epitaxy in the N-rich regime. Appl. Phys. Lett. 104 (7), 072107 (2014).
- Hardy, M. T., et al. Morphological and microstructural stability of N-polar InAlN thin films grown on free-standing GaN substrates by molecular beam epitaxy. J. Vac. Sci. Technol., A. 34 (2), 021512 (2016).
- Hardy, M. T., et al. Indium incorporation dynamics in N-polar InAlN thin films grown by plasma-assisted molecular beam epitaxy on freestanding GaN substrates. J. Cryst. Growth. 245, (2015).
- Leszczynski, M., et al. Indium incorporation into InGaN and InAlN layers grown by metalorganic vapor phase epitaxy. J. Cryst. Growth. 318 (1), 496-499 (2011).
- Storm, D. F., et al. Ultrathin-barrier AlN/GaN heterostructures grown by rf plasma-assisted molecular beam epitaxy on freestanding GaN substrates. J. Cryst. Growth. 380, 14-17 (2013).
- Storm, D. F., Katzer, D. S., Meyer, D. J., Binari, S. C. Oxygen incorporation in homoepitaxial N-polar GaN grown by radio frequency-plasma assisted molecular beam epitaxy: Mitigation and modeling. J. Appl. Phys. 112 (1), 013507 (2012).
- Storm, D. F., et al. Effect of interfacial oxygen on the microstructure of MBE-grown homoepitaxial N-polar. J. Cryst. Growth. 409, 14 (2014).
- Meyer, D. J., et al. High Electron Velocity Submicrometer AlN/GaN MOS-HEMTs on Freestanding GaN Substrates. IEEE Electron Device Lett. 34, 199 (2013).
- Moseley, M., Billingsley, D., Henderson, W., Trybus, E., Doolittle, W. A. Transient atomic behavior and surface kinetics of GaN. J. Appl. Phys. 106 (1), 014905 (2009).
- Koblmüller, G., et al. Ga Adlayer Governed Surface Defect Evolution of (0001)GaN Films Grown by Plasma-Assisted Molecular Beam Epitaxy. Jpn. J. Appl. Phys. 44 (28), L906-L908 (2005).
- Poblenz, C., Waltereit, P., Speck, J. S. Uniformity and control of surface morphology during growth of GaN by molecular beam epitaxy. J. Vac. Sci. Technol., B. 23 (4), 1379-1385 (2005).
Перепечатки и разрешения
Запросить разрешение на использование текста или рисунков этого JoVE статьи
Запросить разрешениеThis article has been published
Video Coming Soon
Авторские права © 2025 MyJoVE Corporation. Все права защищены