Bu içeriği görüntülemek için JoVE aboneliği gereklidir. Oturum açın veya ücretsiz deneme sürümünü başlatın.
Method Article
InAlN bariyer Yüksek elektron-mobilite Transistörler N-polar Plazma destekli Moleküler Işın Epitaksi
Bu Makalede
Özet
Moleküler ışın epitaksi N-polar InAlN bariyer yüksek elektron-mobilite transistörleri (HEMT) büyümek için kullanılır. 1750 cm 2 / V ∙ sn gibi yüksek hareket kabiliyeti ile pürüzsüz, bileşim açısından homojen InAlN katmanları ve HEMT gofret hazırlık kontrolü, kat büyüme koşulları ve epitaksiyel yapısı sonuçları.
Özet
Plazma destekli moleküler ışın epitaksi yüksek kaliteli, yüksek elektron-mobilite transistörler (HEMT) için gerekli pürüzsüz, ani arayüzleri ile III-nitrür ince filmlerin ve heteroyapıların epitaksiyel büyüme için uygundur. Bir prosedür pul hazırlanması ve tampon katmanları, InAlN engelleyici tabaka, AIN ve GaN ara katmanlar ve GaN kanalı büyümesi dahil olmak üzere N polar InAlN HEMT büyümesi için sunulmuştur. sürecin her adımında kritik konular gibi Ga GaN tampon içinde birikimi, InAlN kompozisyon homojenliği üzerine sıcaklığın rolü ve AlN ara tabakanın sırasında Ga akı kullanımı ve kesme öncesinde GaN kanal büyümesini engelleyen olarak tanımlanır. Kompozisyon homojen N-polar InAlN ince filmlerin 0.19 nm ve gibi düşük yüzey kök ortalama kare pürüzlülüğü ile gösterilmiştir HEMT yapıları bir yaprak yük yoğunluğuna sahip cihazlar için 1,750 cm2 / V ∙ sn gibi yüksek hareketlilik sahip bildirildi InAlN tabanlı 1.7 x 1013 cm -2.
Giriş
Moleküler ışın epitaksi (MBE) yetiştirilen filmde düşük kirlilik birleşmesini sağlamak için 10 -11 Torr gibi düşük taban basınçları ile ultra-yüksek vakum ortamı kullanan bir çok yönlü epitaksiyel ince film büyütme tekniğidir. epitaxially yetiştirilen tabakaların oluşumu ve büyüme oranı, her efüzyon bir hücrenin sıcaklığı, ve çeşitli başlangıç maddelerinin böylece buharlaşan akı kontrol edilerek belirlenir. III-nitrür epitaksi aktif azot (N *) bir akı ya bir N2 plazma 1,2 (RF plazma tarafından sağlanır ise III-elementler (in, Al, Ga), tipik olarak efüzyon hücreleri tarafından sağlanan grubu olması halinde -assisted MBE.:. PAMBE ya RFMBE) ya da amonyak (NH3 -MBE) 3,4 MBE büyümesi 5 düşük büyüme sıcaklıklarında ve metalorganik kimyasal buhar çökeltme gibi diğer epitaksiyel geliştirme teknikleri, daha keskin ara yüzey abruptness ile karakterize edilen bir şematik gösterilmiştir Şekil 1 'de.
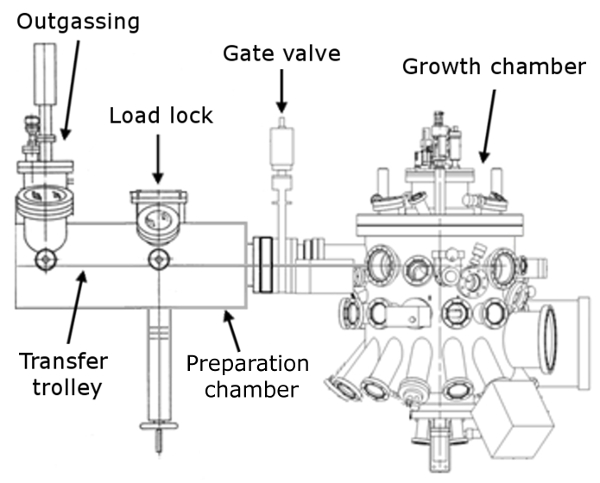
Şekil 1:.. MBE sistemi şematik yük kilidi, transfer sistemi, gaz çıkışının istasyonu ve büyüme odasını gösteren şematik bu rakamın daha büyük bir versiyonunu görmek için lütfen buraya tıklayınız.
III-nitrür kristal yönlendirilmelerinde çeşitli sahip substratlar üzerinde yetiştirilir. En yaygın olarak kullanılan yönlendirme bariyer tabakası, tipik olarak AlGaN ve GaN kanal arasındaki polarizasyon farkı kullanarak doping olmayan iki boyutlu elektron gaz oluşumunu sağlar Ga polar Cı -plane vardır. GaN polar olmayan çeşitli ve yarı polar yönelimler nedeniyle, aynı zamanda HEMT aplikasyon bu yönelimleri daha az istenilir yapan 6,7 kuantum kuyu, azaltılmış polarizasyon etkileri için optoelektronik önemli ilgi görmüştürns. N polar yönelik aygıtlar nedeniyle alışılmış Ga polar cihazlar üzerinde çok sayıda doğal avantajlarından için yeni nesil yüksek frekanslı HEMT işlemi için caziptir. Şekil 2'de gösterildiği gibi, 8 N-polar cihazlarda bariyer tabakası sonuçlanan GaN kanal altında yetiştirilir doğal arka bariyer o kanalın elektrostatik kontrolünü yardımcıları ve GaN kanalına kolay geçerli erişim sağlayan ve temas direnci azaltırken, kısa kanal etkilerini azaltır. kanal kalınlığı yüksek frekans cihazlar için küçültülmüş olarak engelleyici tasarım Fermi düzeyi sabitleme etkileri kayıp kanal sorumlu telafi etmek için modifiye edilebilir, böylece bariyer aynı zamanda kanal ayrı olarak kontrol edilebilir.
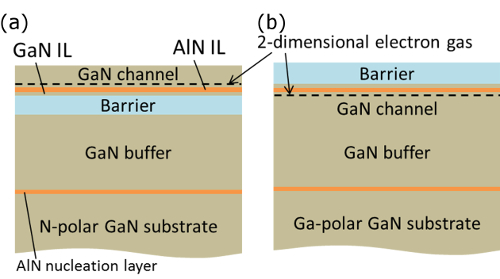
Şekil 2:. Karş (a) bir N-polar HEMT ve (b) bir Ga polar HEMT bir epitaksiyel tabaka şematik bir tabaka yapısıison. Bu rakamın büyük halini görmek için lütfen buraya tıklayınız.
yüksek hızda kullanılan HEMT, yüksek güç yükselteçleri normalde SiC yüksek termal iletkenlik yararlanmak için SiC yüzeylerde yetiştirilmektedir. Düşük diş çıkığı yoğunluğu müstakil GaN yüzeyler elektron hareketliliği, 9 ve böylece yüksek frekanslı performansını artırmak artırmak için kullanılabilir. Bir AlN çekirdeklenme tabakasının büyümesinin ardından, kalın bir GaN tampon mekansal HEMT kanalından büyütme arayüzünde kirleri ayırmak ve elektrik izolasyonu artırmak için yetiştirilir. Diğer III-V malzemelerin aksine, PAMBE yetiştirilen GaN tipik olarak 1, örneğin, metal açısından zengin koşullarda, düzgün bir yüzey morfolojisi elde etmek için 10,11 daha büyük olan bir grup III / V oranına sahip büyüme koşulları gerektirir. X Al 1- x N bir alter olduğunuo büyüdü kafes x ≈ 0.18 için GaN eşleştirilmiş olabilir ve üzerinde Algan engelleri iki kez kanal şarj göreli yüksek olması nedeniyle kendiliğinden polarizasyon üretebilirsiniz çünkü yerli bariyer III-nitrür HEMT malzeme ve son zamanlarda büyük ilgi aldı. Aksine 12-15 Algan bariyerler, Ga 16 böylece yüzey Ga zengin GaN tampon tabaka büyümesi ve öncesinde InAlN büyüme sonrasında aşırı Ga ücretsiz sağlamak için alınması gereken bakım, InAlN tabakalarında in tercihen dahil edecektir.
yüzeye Ga Kontrol GA-damlacık oluşumu için gerekli akı az daha düşük bir Ga akı suppling ile gerçekleştirilebilir. Ancak, bu büyüme pencere küçük ve aşırı Ga Ga akı birikimi ve makroskopik damlacık oluşumuna neden olurken yüzey morfolojisi neden olacaktır yetersiz Ga yüzey kaplama plato / hendek morfolojisi içine düşmesine. 17 Yansıma yüksek enerjili elektron kırınımı (RHEED) keskinliği Sığ Ga birikmesi ve geri çekilmesine izlemek için de kullanılabilir. Ga yüzey kaplama RHEED yoğunluğunda bir azalma ve Ga kapatma arasında bir gecikme ile gösterilir (N *) kapıları ve Şekil 3'te gösterildiği gibi, RHEED yoğunluğu ilk artışın, Ga birikmesi göstermektedir.

Şekil 3:. Tetiklenen edinimi kullanarak, döndürme kapsamında edinilen RHEED desen ölçülen RHEED yoğunluğu RHEED yoğunluğu sinyali ile Ga kapsama İzleme. Yetersiz Ga akı kepenkleri kapattıktan sonra yoğunluğunda ani bir artış olarak ifade edilir (gösterilmemiştir). Doymuş / İdeal Ga kapsama deklanşör kapanması ve ani RHEED beyazlatma ve ilk RHEED parlatma bir gecikme yanı sıra daha uzun 60 s alarak tam yoğunluk iyileşme ile sonuçlanan bir daha kademeli yoğunluk artışı hem de görülen aşırı Ga kapsama arasında bir gecikme ile gösterilir.com / files / ftp_upload / 54775 / 54775fig3large.jpg "target =" _ blank "> bu rakamın daha büyük bir versiyonunu görmek için lütfen buraya tıklayınız.
PAMBE tarafından InAlN sağlanması yüksek kaliteli olarak zengin sınırları ile çevrili, Al-zengin bölgelerinden oluşan bir "bal peteği" mikro sonuçlanan yanal kompozisyon dalgalanmaların varlığı ile karmaşıklaşır. Bu mikro 18 Eliminasyon 50 hakkında bir alt tabaka sıcaklığı kullanılarak elde edilir Gelen desorpsiyonu, N-polar InAlN için 15,19,20 ya da yaklaşık olarak 630 ° C başlangıç ° C üzerinde. Bu yüksek sıcaklık artış rejiminde üzere Al 1 x N bileşim olup, daha yüksek sıcaklıklar dahil, alt ile sonuçlanan alt-tabaka sıcaklığında güçlü bir fonksiyonu olduğu, x. Akı uygulamada akı maksimum akı artan dahil verimliliği bir azalma ile sınırlı olsa da, buharlaştırma kayıp telafi etmek için arttırılabilir. 21 nedeniyle de içinde "etkisi gömme olarak", gelen Al atomları tuzak olarak kompozisyon artırmak ve buharlaşan önleyebilirsiniz büyüme hızını artırarak, alt tabaka sıcaklığı düşürmek veya akı olarak artan ek olarak. 21,22 Yüksek büyüme oranları orantılı olarak ve Al akı artırarak elde edilebilir. N açısından zengin bir büyüme koşullarını korumak için, K *, N2 akımı hızı artan plazma odası tasarımı geliştirmek ya da diyafram levhası delik, artan RF plazma gücü arttırarak elde edilebilir, hem de yüksek olması gerekir yoğunluk.
InAlN tabanlı HEMT Ek epitaksiyel tabakalar Gan ve AIN arakatmanlarının (ILS) ve GaN kanalı bulunmaktadır. Bir AlN IL hareketlilik u yanı sıra kanal levha yük yoğunluğu n s artırabilir bariyer ve kanal arasına yerleştirilen. hareketlilik artış InAlN b elektron dalga fonksiyonu örtüşme azaltılması atfedilirarrier ve daha sonra metal saçılma. 9 AIN IL yüksek kaliteli bir büyüme sağlamak için, Ga akı aşırı bir yüzey aktif olarak hareket büyüme sırasında sağlanır. Bir GaN IL kanal ücreti azaltırken daha hareketliliği artırmak için AlN IL ve bariyer arasında kullanılabilir. GaN kanal IL'lerin ve kanal olsa bariyerden sürekli büyüme sağlayarak, InAlN bariyer olarak aynı sıcaklıkta yetiştirilebilir. Geliştirilmiş hareketlilik AIN IL sonra büyümeyi engellemeden ve GaN kanalı büyüyen önce büyüme sıcaklığının artırılması ile elde edilmiştir. Bu durumda, koruyucu Ga yüzey kaplama hareket bozulmasını önlemek için kesme esnasında muhafaza edilmesi gerekmektedir.
Aşağıdaki protokol, N-polar GaN substratlar üzerinde yetiştirilen InAlN bariyer HEMT özellikle geçerlidir. Doğrudan bir 50 nm kalınlığında bir N zengin AIN katmanı içerecek Cı polar 4H ya 6H-SiC substratlar üzerinde büyümeye uzatılabilir.
Protokol
1. Efüzyon Hücre Rampa ve Akı Kalibrasyon
- Sıvı N 2 cryo-panellere ve büyüme odası taban basıncı ulaştığını akan onaylayın.
- Ga ve hücreler 1 ° C / saniyenin altındaki bir rampa oranında kendi ışın akı ölçümü (BFM) sıcaklığı sıvısı hücrelerini rampa ve Al için 10 ° C / dak. termal olarak stabilize etmek için hücreler 1 saat beklemek.
- 30-60 saniye boyunca her hücrenin deklanşöre açın ve sonra 1-2 dakika boyunca deklanşöre kapatın. Her hücre için üç kez tekrarlayın. İlk ışın akı iyon göstergesi ölçümü atın ve ikinci iki ortalama. önceki akı / sıcaklık kalibrasyonları göre istenilen akı elde etmek için hücre sıcaklığını ayarlamak.
2. Yüzey Hazırlama ve Yükleme
- Ex-situ substrat temizlik
- Yük epi-hazır N-polar GaN herhangi ex-situ temizlik olmadan, doğrudan substratları. gofret daha fazla havaya maruz kaldıysaBirkaç saat daha, aseton (30 sn), izopropanol (30 saniye) ve deiyonize (Dİ) su (60 sn) ile yıkayın. Bu levhanın yüzeyine daha az parçacıklar bırakmak için eğilimi, mümkün Durulama daldırma tercih edilir.
NOT:. Ga-polar GaN yüzeylerde için temiz bir daha titiz bir yüzey tavsiye edilir 23
- Yük epi-hazır N-polar GaN herhangi ex-situ temizlik olmadan, doğrudan substratları. gofret daha fazla havaya maruz kaldıysaBirkaç saat daha, aseton (30 sn), izopropanol (30 saniye) ve deiyonize (Dİ) su (60 sn) ile yıkayın. Bu levhanın yüzeyine daha az parçacıklar bırakmak için eğilimi, mümkün Durulama daldırma tercih edilir.
- yük gofret
- Yük kilit izolasyon gate vana kapatın ve N2 ile havalandırma.
- tutucu üzerine gofret yükleyin ve yük kilit kaseti dönün. yük kilit kaba pompası açın ve kaba pompa vana ve çeşitli vanasını açın.
- manifoldu basınç 0.1 Torr altına düştüğünde, manifoldu ve kaba pompa vanalarını kapatın. kaba pompasını kapatın ve yük kilit turbo pompa izolasyon vanasını açın.
- yük kilidi 30-60 dakika boyunca aşağı pompa izin verin. İdeal olarak, hazırlık odasına aktarmadan önce 10 -6 -10 -7 Torr bir yük kilit basınç kullanmayın.
- Hazırlık odasına yük kilidi açmak ve yalpalama sopa kullanarak arabası gofret aktarın. Daha sonra Preparasyon odasındaki gaz çıkışının istasyonuna gofreti aktarmak için arabası kullanın. Hazırlık odasının üzerinde bir döner besleme oluğuna kullanarak bir ray boyunca elle arabası hareket ettirin.
- gazın atılması gofret
- 10 dakika boyunca 700 ° C'ye kadar gaz çıkışının istasyonu ısıtıcı sıcaklığını rampa.
- 30 dakika sonra, tekrar aşağı 100 ° C sıcaklık rampa. Sıcaklık 250 ° C ≤ olduğunda, gaz çıkışının istasyonunda sallantı sopa kullanarak arabası geri gofret aktarın.
- Büyüme odasına yük gofret
- Yük konumuna substrat manipülatör indirin hazırlama / büyüme odası vanayı açıp manipülatör için gofret tutucu aktarın.
- Yüzey ısıtıcının yanında, büyüme konumuna manipülatör kaldırın.
- arabası ve cl kaldırkapak valfine ose.
- N 2 şişe vana, regülatör vana ve izolasyon iğne vanasını açın. 1.5 sccm'lik için kütle akış kontrolörü (MFC) Set (ya da 3-4 x 10 -5 Torr bir odacık basıncını almak için gerektiği kadar). Plazma ateşleme için optimum basınç kuvvetle sistem bağlıdır. N2, çok yüksek saflıkta (tercihen daha 6N daha büyük) ve bir ilave filtre bundan başka yabancı maddeleri azaltmak için hat kullanılır olması gerektiğine dikkat ediniz.
- kapalı N * ve ana kepenkleri, plazma RF güç kaynağı ve otomatik eşleştirme ağ denetleyicisi açın. Plazma tutuşturur kadar RF gücünü artırmak.
- Bu durumda, istenen işlem koşullarına 350 W ve 2.0 SCCM RF gücü ve bir N2 akımı ayarlayın. Verilen plazma koşulları elde edilen N * akı sisteme bağlıdır, ama burada, bu koşullar 5.0 mil / dakika GaN büyümesi oranı, ya da 1.8 mil -2 sn'lik bir K * akışı elde -1. bağlı bir spektrometre ile plazma stabilitesinin gözlenmesiPlazma odasının arka cam.
- Ga birikimi ve desorpsiyon: Yerinde yüzey hazırlığı
- ≤1 ° C / saniyenin altındaki bir artış oranı istenen GaN büyümesi sıcaklığının üzerinde 10 ° C'ye kadar alt-tabaka ısıtıcı kadar rampa. Bu durumda, 730 ° C arasında yaklaşık yonga sıcaklığı kullanın.
- gofret yüzeyinin bozulması izlemek ve Ga kapsama izlemek için RHEED sistemi açın. El ile alt tabaka rotasyon açın. Alt tabaka büyümesi sırasında dönerken statik bir görüntü sağlamak için alt tabaka dönme başına bir kez RHEED desen toplamak için harekete RHEED toplama yazılımı kurun.
- 1 dakika için substrat deklanşörü ve Ga deklanşör açın. RHEED yoğunluğu daha sonra azalır Ga birikir olarak bir platoya ulaşır emin olun. Ga akı GaN büyümesi için kullanılana benzer olmalıdır. Burada, Ga akı, yaklaşık 3.7 nm -2 sn -1.
- 2 dakika boyunca çekim kapatın ve RHEED sağlamakGa desorpsiyon belirten yoğunluğu artar ve 2 dakika bitmeden bir platoya ulaşır.
- Tekrarlayın 2.5.2-2.5.4 üç kez, 24 Adımları ve sonra GaN büyüme sıcaklığına substrat rampa.
3. HEMT Büyüme
- tampon büyüme
- 1 dk nitrürleme N * deklanşörü açarak büyümeyi başlatın.
- Al çekim açarak ince 1-3 nm N-zengin AlN çekirdeklenme katmanı büyütün. Bu AlN tabakası 25, ancak AlN katmanı X-ışını kırınımı (XRD) ölçümleri komplike ve XRD tabanlı kalibrasyon numuneleri için tavsiye edilmez, diş çıkık nesil önlemeye yardımcı olabilir. Yaklaşık olarak 1 mil / dak bir büyüme oranı veren InAlN tabakası için aynı Al fluks kullanarak, ya da yaklaşık 0.36 mil -2 sn-1.
- Al ve N * deklanşör kapatın ve hemen Ga yüzey doyurmak için izin 10 sn Ga deklanşörü açın RHEED yoğunluğu ra düşmelidirpidly. (Hala açık Ga çekim ile) N * deklanşör açın ve GaN 5 dk büyür. Kullanımı olun veya C doping, özellikle GaN yüzeylerde ayaklı için tampon elektrik kaçak akımları önlemek için.
- 1 dk büyüme kesinti Ga ve N * kepenkleri kapatın. RHEED yoğunluğu izleyin. RHEED yoğunluğu hemen artarsa, o zaman Ga akı yeterince yüksek değildir. RHEED yoğunluğu> 30 saniye sonra artar ya da 1 dakika içinde bir plato ulaşamazsa o Ga akı çok yüksek. Şekil 3'e bakın.
- birkaç derece substrat sıcaklığını arttırın (ya da Ga efüzyon hücre sıcaklığını düşürmek) 3.1.4 görülen yüksek Ga akı telafi etmek için. Ga akı çok düşük ise, alt tabaka sıcaklığını azaltmak (ya da Ga efüzyon hücre sıcaklığını artırmak) telafi etmek için.
- Adımları Tekrar 3.1.3-3.1.5 RHEED yoğunluk artar ve RHEED yoğunluğu 1 dakika önce bir platoya ulaşır önce 15-30 sn gecikme kalmayıncaya kadar.
- Adımlar tekrarlamaya devam edin 3.1.4-3.1.5 istenen GaN kalınlığı ulaşılana kadar. kalibre büyüme oranı ile toplam büyüme süresini çarpılarak kalınlığını belirler. Ga açısından zengin bir büyüme için, sırayla, ayrı olarak yetiştirilen kalibrasyonu numune bilinen bir büyüme süre kalınlığını ölçmek için XRD kullanılarak hesaplanabilir N * akı, büyüme hızını belirler.
- InAlN bariyer büyüme
- Tüm Ga çekinceye sağlamak için son GaN büyüme aşamasından sonra ek 1 dakika bekleyin.
- Hızla, yaklaşık 630 ° C'ye kadar InAlN büyüme sıcaklığına kadar rampa. alt-tabaka sıcaklığı, yaklaşık 2 dakika dengelenmesine izin verin.
- Olarak, Al ve N * kepenkleri açın. RHEED yoğunluğu azalır ve ilk 3 dakika içinde bir düzlüğe ulaşmalıdır. RHEED yoğunluğunun devam azalma InAlN büyümesine zararlı olan In birikimi olduğunu gösterir. RHEED desen düzgün bir yüzey gösteren çizgili kalmalıdır. benn Al tozları 1.25 nm / dak grup III sınırlı büyüme oranını veren yaklaşık 0.31 ve 0.36 nm -2 sn -1 vardır.
- Olarak, Al ve N * İstenilen bariyer kalınlığı sonra kepenkleri ulaşıldı kapatın. N zengin bir büyüme için, toplam grup III akı ile büyüme oranını belirler. Ayrı olarak yetiştirilen InAlN kalibrasyon numune üzerinde XRD kullanılarak büyüme oranını ölçer. Burada verilen koşullar kullanılarak 15 nm InAlN bariyer, 12 dakika 30 saniye için kepenkleri açın.
- Interlayer ve kanal büyüme
- Öncelikle, daha sonra 5 saniye Ga deklanşörü açmak N * deklanşör açın ve GaN ara tabaka büyür. alt-tabaka sıcaklığı hala InAlN büyüme sıcaklığında olmalıdır.
- AlN ara tabaka büyümeye Ga veya N * kepenk kapatmadan Al deklanşör açın. ara tabakanın Al fluks t, ideal InAlN bariyer tabakası için kullanılan daha sonra farklı bir Al efüzyon hücresi kullanılarak, N * akı ile aynı veya biraz daha yüksek olmalıdıro hücre sıcaklığını değiştirmek zorunda kalmamak. adım 3.2.4 bakınız.
- N * Al kepenkleri kapatın ama açık Ga deklanşöre bırakın. GaN kanal sıcaklığına tabaka sıcaklığını Rampa.
- 30 saniye sonra Ga deklanşör kapatın. ve yeniden açın Ga deklanşör (RHEED yoğunluğunun artmaya başlar en kısa sürede ya da), 30 saniye bekleyin. Yüzey GaN kanal büyüme sıcaklığına ulaşana kadar döngüsü Ga çekim devam ediyor. Aşırı Ga birikimini önlerken Bu yüzeyini korumak olacaktır.
- Daha sonra, 5 saniye Ga deklanşörü açın N * deklanşör açın ve GaN kanalı büyür.
- Ga, N * ve ana kepenkleri kapatın. 200 ° C'ye kadar substrat sıcaklığı rampa N * plazma kapatın ve N2 gaz akışını kapatın.
- gün bitmiş eğer onların bekleme sıcaklıklara hücreleri rampa aşağı.
- Daha sonra, 8 x 10 -7 Torr altına düştüğü için 250 ° C ve oda basıncının altına azaltmak için yüzey sıcaklığı bekleyinBüyüme odası vanayı açıp geri arabası gofret tutucu aktarın.
- Geri yükleme kilidi gofreti aktarmak için Adım 2.2 ters izleyin, N2 ile havalandırma ve gofret çıkarın. Büyüme odası kapı vana yük kilidi açmadan önce kapalı olduğundan emin olun ve yük kilit turbo pompa gate vana havalandırma önce kapalı olduğundan emin olun.
- Adımları takip 2.2.3-2.2.5 yüksek vakum kaset ve yük kilidi dönün.
4. Karakterizasyonu
- Kanal büyüme sırasında oluşmuş olabilecek çukurlar, çatlaklar veya Ga-damlacıklar, XRD Arayüzey ve yapı kalitesini kontrol etmek için, ve AFM yüzey morfolojisi kontrol etmek için kontrol etmek için optik mikroskopi kullanılarak malzeme kalitesi karakterize eder. 20,21
- Ga-damlacıkları mevcut ise, kimyasal olarak duyarlı K polar yüzeye zarar vermeden damlacıkları çıkarmak için 5-10 dakika boyunca konsantre HF asit gofret bırakın.
- sac res ölçünLehighton temassız direnç ölçümleri kullanılarak istance.
- Salon ve CTLM ölçümleri ve dc ve RF transistör karakterizasyonu dahil olmak üzere elektrik karakterizasyonu, izin örnek işleyin. 9,26
Sonuçlar
X-ışını difraksiyonu (XRD) Şekil 4 'de, N-polar GaN substratlar üzerinde büyümüş gösterilen InAlN İnce filmlerin tarama, (a) zirve tek hem 50 ve 200 nm-kalınlıkta filmler için. 50 nm kalınlığında InAlN filmin XRD taraması Pendellösung çok yüksek arayüzey kalitesine işaret, sipariş inci 15'e kadar saçaklar sergiler. Şekil 4'te asimetrik karşılıklı uzay haritası (b) 2...
Tartışmalar
Yüksek kaliteli bir GaN tampon tabaka büyümesi bir III-nitrür HEMT yüksek elektron hareketliliği sağlamak için çok önemlidir. N polar InAlN HEMT halinde, tampon tabakası bir büyüme Tüm GA önce InAlN büyüme yüzeyinden temizlenmelidir gereği ile karmaşıklaşır. Bu tür metal modüle epitaksi, 27 orta Ga kapsamı ve Ga damlacık birikim rejiminin, 28 kenarında büyüme koşulları kullanılarak ya da sürekli bir N * izin olarak burada anlatılan prosedüre ek olarak ...
Açıklamalar
The authors have nothing to disclose.
Teşekkürler
The authors thank Mr. Neil Green for assistance with sample preparation. This work was supported by the Office of Naval Research under funding from Dr. P. Maki. MTH was supported by a National Research Council Postdoctoral Fellowship.
Malzemeler
| Name | Company | Catalog Number | Comments |
| Freestanding N-polar GaN wafer | Kyma | 10 mm x 10 mm | |
| C-polar SiC wafer | Cree | W4TRE0R-L600 | 3 inch diameter |
| Microelectronics grade acetone | Fischer Scientific | A18-4 | |
| Microelectronics grade isoproponal | J.T. Baker | 9079-05/JT9079-5 | |
| Al source material (6N5 pure) | UMC | ALR62060I | |
| Ga source material (7N pure) | UMC | GA701 | |
| In source material (7N pure) | UMC | IN750 | |
| ULSI N2 source gas (6N pure) | Matheson Tri-gas | G2659906D | |
| PRO-75 MBE system | OmicronScientia |
Referanslar
- Hughes, W. C., et al. Molecular beam epitaxy growth and properties of GaN films on GaN/SiC substrates. J. Vac. Sci. Technol., B. 13 (4), 1571-1577 (1995).
- McSkimming, B. M., Wu, F., Huault, T., Chaix, C., Speck, J. S. Plasma assisted molecular beam epitaxy of GaN with growth rates 2.6 µm/hr. J. Cryst. Growth. 386, 168-174 (2014).
- Grandjean, N., Massies, J., Leroux, M. Nitridation of sapphire. Effect on the optical properties of GaN epitaxial overlayers. Appl. Phys. Lett. 69 (14), 2071-2073 (1996).
- Corrion, A. L., Wu, F., Speck, J. S. Growth regimes during homoepitaxial growth of GaN by ammonia molecular beam epitaxy. J. Appl. Phys. 112 (5), 054903 (2012).
- Mazumder, B., et al. Atom probe analysis of AlN interlayers in AlGaN/AlN/GaN heterostructures. Appl. Phys. Lett. 102 (11), 111603 (2013).
- Feezell, D. F., Speck, J. S., DenBaars, S. P., Nakamura, S. Semipolar (2021) InGaN/GaN Light-Emitting Diodes for High-Efficiency Solid State Lighting. J. Disp. Technol. 9 (4), (2013).
- Hardy, M. T., et al. True Green Semipolar InGaN-Based Laser Diodes Beyond Critical Thickness Limits Using Limited Area Epitaxy. J. Appl. Phys. 114 (18), 183101 (2013).
- Wong, M. H., et al. N-polar GaN epitaxy and high electron mobility transistors. Semicond. Sci. Technol. 28 (7), 074009 (2013).
- Hardy, M. T., et al. Charge control in N-polar InAlN high-electron-mobility transistors grown by plasma-assisted molecular beam epitaxy. J. Vac. Sci. Technol., B. 33 (6), 061207 (2015).
- Piquette, E. C., Bridger, P. M., Beach, R. A., McGill, T. C. Effect of Buffer Layer and III/V Ratio on the Surface Morphology of GaN Grown by MBE. Symposium G '-' GaN and Related Alloys. , (1998).
- Tarsa, E. J., et al. Homoepitaxial growth of GaN under Ga-stable and N-stable conditions by plasma-assisted molecular beam epitaxy. J. Appl. Phys. 82 (11), 5472-5479 (1997).
- Kuzmik, J. Power electronics on InAlN/(In)GaN: Prospect for a record performance. IEEE Electron Device Lett. 22 (11), 510-512 (2001).
- Fernández-Garrido, S., Gačević, &. #. 3. 8. 1. ;., Calleja, E. A comprehensive diagram to grow InAlN alloys by plasma-assisted molecular beam epitaxy. Appl. Phys. Lett. 93 (19), 191907 (2008).
- Katzer, D. S., et al. Molecular beam epitaxy of InAlN∕GaN heterostructures for high electron mobility transistors. J. Vac. Sci. Technol., B. 23 (3), 1204-1208 (2005).
- Kaun, S. W., et al. GaN-based high-electron-mobility transistor structures with homogeneous lattice-matched InAlN barriers grown by plasma-assisted molecular beam epitaxy. Semicond. Sci. Technol. 29 (4), 045011 (2014).
- Hoke, W. E., Torabi, A., Mosca, J. J., Kennedy, T. D. Thermodynamic analysis of cation incorporation during molecular beam epitaxy of nitride films using metal-rich growth conditions. J. Vac. Sci. Technol., B. 25 (3), 978-982 (2007).
- Koblmüller, G., Reurings, F., Tuomisto, F., Speck, J. S. Influence of Ga/N ratio on morphology, vacancies, and electrical transport in GaN grown by molecular beam epitaxy at high temperature. Appl. Phys. Lett. 97 (19), 191915 (2010).
- Zhou, L., Smith, D. J., McCartney, M. R., Katzer, D. S., Storm, D. F. Observation of vertical honeycomb structure in InAlN∕GaN heterostructures due to lateral phase separation. Appl. Phys. Lett. 90 (8), 081917 (2007).
- Ahmadi, E., et al. Elimination of columnar microstructure in N-face InAlN, lattice-matched to GaN, grown by plasma-assisted molecular beam epitaxy in the N-rich regime. Appl. Phys. Lett. 104 (7), 072107 (2014).
- Hardy, M. T., et al. Morphological and microstructural stability of N-polar InAlN thin films grown on free-standing GaN substrates by molecular beam epitaxy. J. Vac. Sci. Technol., A. 34 (2), 021512 (2016).
- Hardy, M. T., et al. Indium incorporation dynamics in N-polar InAlN thin films grown by plasma-assisted molecular beam epitaxy on freestanding GaN substrates. J. Cryst. Growth. 245, (2015).
- Leszczynski, M., et al. Indium incorporation into InGaN and InAlN layers grown by metalorganic vapor phase epitaxy. J. Cryst. Growth. 318 (1), 496-499 (2011).
- Storm, D. F., et al. Ultrathin-barrier AlN/GaN heterostructures grown by rf plasma-assisted molecular beam epitaxy on freestanding GaN substrates. J. Cryst. Growth. 380, 14-17 (2013).
- Storm, D. F., Katzer, D. S., Meyer, D. J., Binari, S. C. Oxygen incorporation in homoepitaxial N-polar GaN grown by radio frequency-plasma assisted molecular beam epitaxy: Mitigation and modeling. J. Appl. Phys. 112 (1), 013507 (2012).
- Storm, D. F., et al. Effect of interfacial oxygen on the microstructure of MBE-grown homoepitaxial N-polar. J. Cryst. Growth. 409, 14 (2014).
- Meyer, D. J., et al. High Electron Velocity Submicrometer AlN/GaN MOS-HEMTs on Freestanding GaN Substrates. IEEE Electron Device Lett. 34, 199 (2013).
- Moseley, M., Billingsley, D., Henderson, W., Trybus, E., Doolittle, W. A. Transient atomic behavior and surface kinetics of GaN. J. Appl. Phys. 106 (1), 014905 (2009).
- Koblmüller, G., et al. Ga Adlayer Governed Surface Defect Evolution of (0001)GaN Films Grown by Plasma-Assisted Molecular Beam Epitaxy. Jpn. J. Appl. Phys. 44 (28), L906-L908 (2005).
- Poblenz, C., Waltereit, P., Speck, J. S. Uniformity and control of surface morphology during growth of GaN by molecular beam epitaxy. J. Vac. Sci. Technol., B. 23 (4), 1379-1385 (2005).
Yeniden Basımlar ve İzinler
Bu JoVE makalesinin metnini veya resimlerini yeniden kullanma izni talebi
Izin talebiThis article has been published
Video Coming Soon
JoVE Hakkında
Telif Hakkı © 2020 MyJove Corporation. Tüm hakları saklıdır