JoVE 비디오를 활용하시려면 도서관을 통한 기관 구독이 필요합니다. 전체 비디오를 보시려면 로그인하거나 무료 트라이얼을 시작하세요.
Method Article
InAlN 장벽 높은 전자 이동도 트랜지스터 N-극성 플라즈마를 이용한 분자 빔 에피 택시
요약
분자 빔 에피 택시는 N 극성 InAlN 장벽이 높은 전자 이동도 트랜지스터 (HEMT들)을 성장하는 데 사용됩니다. 1,750cm 2 / V ∙ 초만큼 높은 이동성을 가진 부드러운 구조적으로 균질 InAlN 층 및 HEMT들에서 웨이퍼 제조 관리, 층 성장 조건 및 에피 택셜 구조의 결과.
초록
플라즈마를 이용한 분자선 고품질의 고 전자 이동도 트랜지스터 (HEMT들)에 필요한 매끄러운 급격한 인터페이스 III 족 질화물 박막과의 헤테로 에피 택셜 성장에 적합하다. 수순은, 웨이퍼 제조 및 완충층의 InAlN 배리어 층의 AlN 또는 GaN 중간층과 GaN으로 채널의 성장을 포함하여 N 극성 InAlN의 HEMT의 성장을 위해 제공된다. 프로세스의 각 단계에서의 중요한 문제는 이러한 조지아이 GaN 버퍼에 축적 InAlN 조성 동질성 온도의 역할을하고, AlN을 층간 동안 조지아 플럭스의 사용 인터럽트 종래의 GaN에 대한 채널의 성장을 방지로서 식별된다. 구조적으로 균일 한 N 극성 InAlN 박막 0.19 nm의 낮은 표면의 제곱 평균 제곱 거칠기 입증되는 HEMT 구조가 시트 전하 밀도 장치 1,750cm 2 / V ∙ 초만큼 높은 이동도를 갖는보고 InAlN 계 1.7 × 10의13cm -2.
서문
분자 빔 에피 택시 (MBE)이 성장 된 막의 저 불순물 혼입을 위해 10-11 토르 낮은베이스 압력으로 초고 진공 환경을 사용 다용도 에피 택셜 박막의 성장 기술이다. 에피 택셜 성장 층의 조성 및 성장 속도는 각각 분출 셀의 온도, 각종 원료의 이와 증발 된 플럭스를 제어함으로써 결정된다. III 족 질화물 에피 택시, 활성 질소 (N *) 플럭스의 어느 쪽 N이 플라즈마 1,2- (RF 플라즈마에 의해 제공되는 동안 III 요소 (에서는, 알루미늄 (Al), 조지아)은 일반적 삼출 세포에 의해 제공되는 그룹의 경우, -assisted MBE :.. PAMBE 또는 RFMBE) 또는 암모니아 (NH 3 -MBE)을 3,4- MBE 성장 5 낮은 성장 온도 및 금속 유기 화학 기상 증착 등의 다른 에피 택셜 성장 기술,보다 선명한 계면으로 갑작스런 특징으로 개략 도시된다 그림 1인치
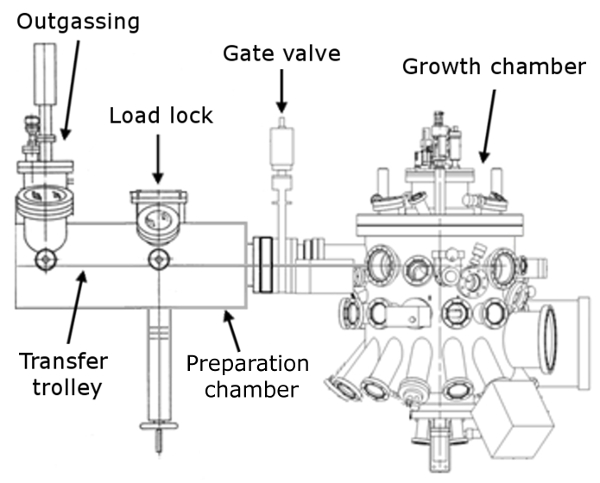
그림 1 :.. MBE 시스템의 개략적 인로드 록, 전송 시스템, 가스 방출 스테이션과 성장 챔버를 보여주는 도식 이 그림의 더 큰 버전을 보려면 여기를 클릭하십시오.
III-질화물 결정 방위의 다양성을 갖는 기판 상에 성장 될 수있다. 가장 일반적으로 사용되는 방향은 배리어 층, 전형적으로 AlGaN으로, 또는 GaN 채널 사이의 편광의 차이를 이용하여 도핑하지 않고 2 차원 전자 가스의 형성을 허용 조지아 - 극성의 C -plane이다. 질화 갈륨의 비극성 다양하고 반 극성 방향 인해 또한 HEMT의 응용 프로그램, 이러한 방향 덜 바람직하게 6,7 양자 우물에서 감소 편광 효과 광전자 상당한 관심을 받았다NS. N 극성 배향 장치 인해 종래의 Ga 극성 장치에 비해 여러 고유 이점 차세대 고주파 HEMT 동작 매력적이다.도 2에 도시 된 바와 같이 8 N 극성 장치에서 배리어 층은, 그 결과 GaN으로 채널 아래에 성장 천연 위로 배리어의 해당 채널의 정전 제어 에이즈와 GaN으로 채널 전류 쉽게 액세스 할 수 있도록하고, 접촉 저항을 저감하면서, 단 채널 효과를 감소시킨다. 상기 채널 두께는, 고주파 장치를위한 스케일 다운됨에 따라 배리어 설계는 페르미 레벨 피닝 효과 손실 채널 전하를 보상하도록 변형 될 수 있도록 배리어는 또한 상기 채널에서 개별적으로 제어 될 수있다.
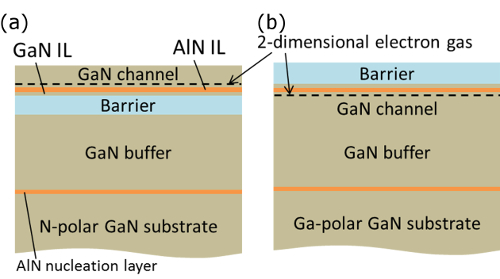
그림 2. 비교 예에 대한 (a)는 N 극성의 HEMT 및 (b)의 Ga 극성 HEMT 에피 택셜 층 개략적 층 구조ISON은. 이 그림의 더 큰 버전을 보려면 여기를 클릭하십시오.
고속 HEMT들에서 사용은 고전력 증폭기는 통상의 SiC의 높은 열전도율을 활용의 SiC 기판 상에 성장된다. 낮은 관통 전위 밀도 GaN 자립 기판은 전자 이동도 9는 이와 같이 높은 주파수 성능 향상을 개선시키기 위해 사용될 수있다. AlN으로 핵 생성 층의 성장에 따라, 두께의 GaN 버퍼 공간적 HEMT 채널에서 재성장 계면에서 불순물을 분리 및 전기 절연을 개선하기 위해 성장된다. 다른 III-V 재료 달리 PAMBE 의해 성장 된 GaN은 전형적으로 1, 즉 금속이 풍부한 조건, 매끄러운 표면 형상을 달성하기 위해 10, 11보다 큰 그룹 III / V 비로 성장 조건을 필요로한다. X의 알 1 X N은 ALTER이다그것이 성장 격자 X ≈ 0.18 위해 GaN으로 일치 할 수 있고, 이상을 AlGaN 장벽 번 채널 대전 상대 높아 자발 분극을 발생시킬 수 있기 때문에 기본 배리어 III 족 질화물 HEMT들 용 재료 및 최근에 상당한 관심을 받고있다. 달리 12-15 AlGaN으로 장벽, 조지아 16 따라서 표면이 조지아 풍부한 GaN 버퍼층 성장과 이전 InAlN 성장 후 초과 가인이 없도록주의해야합니다 관심, InAlN 층에에에 우선적으로 통합 할 예정이다.
표면에서의 Ga 제어 조지아 액적 형성에 필요한 유량보다 약간 작은 조지아 플럭스 납품함으로써 달성 될 수있다. 그러나, 이러한 성장 윈도우는 작고, 과잉의 Ga 플럭스 조지아 축적 육안 액적 형성을 초래할 것 인 동안 표면 모폴로지 발생할 부족의 Ga면 커버리지 고원 / 트렌치 형태로 저하. 17 반사 고 에너지 전자 회절 (RHEED) 한 세기 성만은 조지아 축적 탈착을 모니터링하는데 사용될 수있다. GA 흡착율은 RHEED 강도의 감소 및 GA 개폐 사이의 지연에 의해 지시되면 (N *) 셔터 및도 3에 도시 된 바와 같이 RHEED 강도의 초기 증가는 조지아의 축적을 나타낸다.

그림 3 :. 트리거 인수를 사용하여 회전에 따라 취득한 RHEED 패턴에서 측정 RHEED 강도 RHEED 강도 신호와 조지아 범위를 모니터링. 불충분 조지아 자속은 셔터를 폐쇄 한 후 강도를 즉시 증가에 의해 표시된다 (도시하지 않음). 포화 / 이상적인 조지아 범위는 셔터 폐쇄 및 갑작스러운 RHEED 미백 및 초기 RHEED 미백의 지연뿐만 아니라 이상 60 초를 복용 전체 강도 회복의 결과보다 점진적으로 강도 증가를 모두으로 볼에 초과 조지아 범위 사이에 지연으로 표시됩니다.COM / 파일 / ftp_upload / 54775 / 54775fig3large.jpg "대상 ="_ 빈 ">이 그림의 더 큰 버전을 보려면 여기를 클릭하십시오.
PAMBE 의해 InAlN 달성 고품질 인 리치 경계선으로 둘러싸인 알루미늄 - 풍부 도메인으로 이루어진 "허니컴"미세 결과 횡 조성 변동의 존재에 의해 복잡하게된다.이 미세 18 소거법 (50)에 대해, 기판 온도를 이용하여 달성된다 에서 탈착, N-극성 InAlN에 대한 15,19,20 또는 약 630 ° C의 시작 위 ° C. 이 고온 성장 체제에서는에서 알 1- X N의 조성물은 더 높은 온도가 혼입 낮은 결과와 기판 온도의 강력한 함수이며, X. 은 IN 자속 실제로 자속 최대 자속 증가에 혼입 효율의 저하에 의해 제한되지만으로는, 증발 손실을 보상하기 위해 증가 될 수있다. 21 인해에서 "효과를 매립에"들어오는 알루미늄 원자 트랩에있어서 조성물을 증가시키고 증발을 방지 할 수있는 성장 속도의 증가, 기판 온도를 감소 또는 자속의 증가 외에도. 21,22 고등 성장 속도는 비례 적으로 알 자속을 증가시킴으로써 달성 될 수있다. N 풍부한 성장 조건을 유지하기 위해 상기 N *는 N이 유속을 증가 플라즈마 챔버 설계를 개선하거나 구판 구멍을 증가 RF 플라즈마 전력의 증가에 의해 달성 될 수있는뿐만 아니라, 증가 될 필요 밀도.
InAlN 기반 HEMT들에 추가 에피 택셜 층의 GaN 및 AlN을 중간층 (ILS)과 질화 갈륨 채널을 포함한다. AlN으로 IL 이동성 μ뿐만 아니라 채널 시트 전하 밀도 N 개의 S를 증가시킬 수 배리어와 채널 사이에 삽입 하였다. 이동도의 증가는 InAlN B 형 전자파 기능 중복을 감소에 기인arrier 후속 합금 산란. 9 IL의 AlN의 고품질의 성장을 확보하려면, 조지아 광속의 과량의 계면 활성제 역할을하는 성장 동안 공급된다. GaN의 IL 채널 전하를 감소시키면서, 상기 이동성을 향상시키기 위해 IL의 AlN와 장벽 사이에 사용될 수있다. 이 GaN 채널은 채널의 IL 비록 장벽의 지속적인 성장을 허용하는 InAlN 장벽 동일 온도에서 성장 될 수있다. 향상된 이동도는 AlN으로 IL 후 성장 중단 및 채널의 GaN의 성장 이전에 성장 온도를 증가시킴으로써 얻어진다. 이러한 경우에 보호의 Ga면 따르면 이동성 저하를 방지하기 위해 인터럽트 동안 유지되어야한다.
다음 프로토콜은 N 극성 GaN으로 기판 상에 성장 InAlN 배리어 HEMT들에 특별히 적용된다. 이는 직접적으로 두께 50 nm의 N 풍부한 AlN 층을 포함하여 C-극성 4H- 또는 6H-SiC를 기판 상에 성장에 확장 될 수있다.
프로토콜
1. 삼출액 세포 램프 및 플럭스 보정
- 액체 N 2는 극저온 패널 및 성장 챔버베이스 압력에 도달 한 것을 확인 흐르는.
- 가인과 셀 1 ° C / sec의 온도 변화율 그들의 빔 플럭스 측정 (BFM) 온도 삼출액 세포를 경사로와 Al 10 ℃ / 분. 열 안정에 셀 1 시간을 기다립니다.
- 30 ~ 60 초 동안 각 셀의 셔터를 열고 1 ~ 2 분 동안 셔터를 닫습니다. 각 셀에 세 번 반복합니다. 첫 번째 빔 플럭스 이온 게이지 측정을 무시하고 두 번째 평균. 이전 플럭스 / 온도 교정에 따라 원하는 유량을 달성하기 위해 셀 온도를 조정한다.
2. 기판의 제조 및로드
- 현지 외 기판 세정
- 로드 에피 준비 N 극성 GaN으로는 전 현장 청소하지 않고, 직접 기판들. 웨이퍼를 더 공기에 노출 된 경우몇 시간보다, 아세톤 (30 초), 이소프로판올 (30 초) 및 탈 이온수 (DI) 물 (60 초)에서 씻어. 이 웨이퍼 표면에 작은 입자를 떠나 경향이 가능한 경우 린스 침지하는 것이 바람직하다.
참고 :. 조지아 극성 질화 갈륨 (GaN) 기판들은 깨끗하고보다 엄격한면이 좋습니다 (23)
- 로드 에피 준비 N 극성 GaN으로는 전 현장 청소하지 않고, 직접 기판들. 웨이퍼를 더 공기에 노출 된 경우몇 시간보다, 아세톤 (30 초), 이소프로판올 (30 초) 및 탈 이온수 (DI) 물 (60 초)에서 씻어. 이 웨이퍼 표면에 작은 입자를 떠나 경향이 가능한 경우 린스 침지하는 것이 바람직하다.
- 로드 웨이퍼
- 로드 록 절연 게이트 밸브를 닫고, N 2 벤트.
- 홀더에 웨이퍼를로드하고로드 록에 카세트를 반환합니다. 로드 락 러핑 펌프를 켜고 러핑 펌프 밸브와 매니 폴드 밸브를 엽니 다.
- 매니 폴드의 압력이 0.1 토르 하회하면, 상기 매니 폴드와 러핑 펌프 밸브를 닫는다. 러핑 펌프를 끄고로드 록 터보 펌프 차단 밸브를 엽니 다.
- 로드 락은 30 ~ 60 분 동안 펌프 다운 할 수 있습니다. 이상적으로는, 제조 챔버로 이송하기 전에 -10 -7 10-6 토르의로드 록의 압력을 사용한다.
- 준비 챔버로로드 록을 열고 워블 스틱을 사용하여 트롤리에 웨이퍼를 전송합니다. 이어서 제조 챔버 내의 가스 발생 스테이션에 웨이퍼를 전달하기 위해 트롤리를 사용한다. 준비 챔버에 회전 피드 스루를 사용하여 레일을 따라 수동으로 트롤리를 이동합니다.
- 아웃 가스 웨이퍼
- 10 분 동안 700 ° C의 가스 방출 스테이션의 히터 온도를 진입로.
- 30 분 후, 다시 아래로 100 ° C까지 온도를 진입로. 온도가 250 ° C ≤ 때, 아웃 개싱 역 워블 스틱을 사용 트롤리 다시 웨이퍼 옮긴다.
- 성장 챔버로로드 웨이퍼
- 부하 위치로 기판 매니퓰레이터를 낮추고 제조 / 성장 챔버의 게이트 밸브를 개방하여 조작부에 웨이퍼 홀더 옮긴다.
- 기판 히터 근처, 성장 위치로 조작을 올립니다.
- 트롤리와 카스티를 제거게이트 밸브 OSE.
- N 개의 2 병 밸브, 레귤레이터 밸브와 차단 니들 밸브를 엽니 다. 1.5 SCCM의 유량 제어기 (MFC)를 설정 (또는 3-4 X 10-5 토르의 챔버 압력을 얻기 위해 필요에 따라). 플라즈마 점화를위한 최적의 압력이 강하게 시스템에 의존한다. N 개의 2 초 고순도 (바람직하게는 더 6N 이상) 및 추가 필터가 더 불순물을 줄이기 위해 라인에 사용되어야합니다.
- 폐쇄 N * 및 메인 셔터 플라즈마 RF 전원 및 자동 정합 네트워크 제어기 켜. 플라즈마가 점화 될 때까지 RF 전력을 향상시킬 수 있습니다.
- 이 경우, 소정의 공정 조건에 350 W 2.0 SCCM을 RF 전력 및 N 2 흐름을 설정한다. 소정의 플라즈마 조건으로 인한 N의 * 플럭스 시스템에 의존하지만, 여기에서, 이러한 조건은 5.0 ㎚ / 분으로의 GaN 성장 속도, 또는 1.8 내지 -2 sec의 N의 * 광속을 수득 -1. 받는 부착 분광계 플라즈마 안정성 모니터플라즈마 챔버의 리어 윈도우.
- 조지아의 증착 및 탈착 : 현장 표면 처리에
- ≤1의 ° C / sec의 온도 변화율로 원하는의 GaN 성장 온도보다 10 ° C로 기판 히터 램프 업. 이 경우, 730 ℃의 추정 된 웨이퍼 온도를 사용한다.
- 웨이퍼 표면의 저하에 대한보고 조지아 범위를 모니터링 할 RHEED 시스템을 켭니다. 수동 기판 회전을 켭니다. 기판이 성장 동안 회전 중에 정지 화상을 제공하기 위해 기판의 회전에 따라 회 RHEED 패턴을 수집 트리거 RHEED 수집 소프트웨어를 설정한다.
- 1 분 동안 기판 셔터와 조지아 셔터를 엽니 다. RHEED 강도가 다음 감소 가인이 축적 등의 고원에 도달해야합니다. GA 플럭스의 GaN의 성장에 사용되는 것과 유사 할 것이다. 여기서, 조지아 플럭스는 약 3.7 nm의 -2 초 -1입니다.
- 2 분 동안 셔터를 닫고 RHEED 확인조지아 탈착을 나타내는 강도가 증가하고, 2 분간의 끝 이전에 정체기에 도달.
- 반복 2.5.2-2.5.4 세 번, 24 단계 다음의 GaN 성장 온도로 기판을 램프.
3. HEMT 성장
- 버퍼 성장
- 1 분 질화 위해 N *의 셔터를 개방함으로써 성장을 시작합니다.
- Al의 셔터를 개방하여 박막 1-3 나노 N 리치의 AlN 핵 생성 층을 성장한다. 이 AlN 층 (25)은 그러나, AlN 층은 X 선 회절 (XRD) 측정을 복잡하게 XRD 기반 보정 샘플 추천되지 않고, 관통 전위의 발생을 방지 할 수있다. 약 1 ㎚ / 분의 성장 속도를주는 InAlN 층과 동일한 알루미늄 플럭스를 사용하여, 또는 약 0.36 내지 -2 초 -1.
- 알과 N의 * 셔터를 닫고 즉시 조지아 표면을 포화 할 수 있도록 10 초 동안 조지아 셔터를 열고 RHEED 강도는 가시를 감소해야pidly. (여전히 열려있는 조지아 셔터 포함) N의 * 셔터를 열고 질화 갈륨의 5 분의 성장. 사용되거나 도핑 C, 특히 질화 갈륨 자립 기판을위한 버퍼의 전기 누설 전류를 방지한다.
- 1 분 성장 중단에 대한 Ga 및 N * 셔터를 닫습니다. RHEED 강도를 모니터링합니다. RHEED 강도가 즉시 증가하면, 조지아 플럭스는 충분하지 않다. RHEED 강도> 30 초 후에 증가하거나 1 분 이내 정체기에 도달하지 않으면 다음의 Ga 유량은 너무 높다. 그림 3을 참조하십시오.
- 몇도에 의해 기판 온도를 상승 (또는 가인 유출 셀 온도를 감소) 3.1.4에서 본 가인 높은 광속을 보상하기. 조지아 플럭스가 너무 낮은 경우, 기판 온도를 감소 (또는 가인 유출 셀 온도 증가) 보상.
- 단계를 반복 3.1.3-3.1.5 RHEED 강도 증가 및 RHEED 강도가 1 분 이전에 정체기에 도달하기 전에 15 ~ 30 초의 지연이있을 때까지.
- 단계를 반복 계속 3.1.4-3.1.5 GaN으로 원하는 두께에 도달 할 때까지. 보정 성장 속도가 전체의 성장 시간을 곱하여 두께를 결정합니다. 가인 풍부한 성장 차례로 별도로 성장 캘리브레이션 샘플의 공지 성장 시간에 대한 막 두께를 측정하는 XRD를 이용하여 계산 될 수있는 N *의 광속에 의해 성장 속도를 결정한다.
- InAlN 배리어 성장
- 모든 가인이 증발하기 위해 최종의 GaN 성장 단계 이후에 추가로 1 분을 기다립니다.
- 빨리 약 630 ° C에 InAlN 성장 온도로 램프. 기판 온도를 약 2 분 동안 안정 할 수있다.
- 에서, 알루미늄 (Al), 및 N * 셔터를 엽니 다. RHEED 강도가 저하하고, 제 3 분 이내에 정체기에 도달한다. RHEED 강도의 지속적인 감소는 InAlN 성장에 해로운에서의 축적을 나타낼 수있다. RHEED 패턴은 매끄러운 표면을 나타내는 줄무늬 유지한다. 의 In 및 알루미늄 광속은 1.25 ㎚ / min의 그룹 III 제한 성장률을주는 약 0.31 및 0.36 초 -1 내지 -2이다.
- 에서, 알, 그리고 N * 원하는 장벽 두께 후 셔터가 도달을 닫습니다. N 풍부한 성장, 총 Ⅲ 족 플럭스에 의한 성장 속도를 결정한다. 별도로 성장 InAlN 캘리브레이션 샘플을 XRD를 사용하여 성장 속도를 측정한다. 여기에 주어진 조건을 이용하여 15nm의 배리어 InAlN를 들어, 12 분 30 초 동안 셔터를 연다.
- 층간 및 채널 성장
- 먼저, 5 초 동안 조지아 셔터를 열고 N의 * 셔터를 열고이 GaN 층간 성장합니다. 기판 온도는 여전히 InAlN의 성장 온도에 있어야합니다.
- 의 AlN 층간 성장하기 위해 조지아 또는 N * 셔터를 닫지 않고 알 셔터를 엽니 다. 층간의 알 플럭스 t, 이상적 InAlN 배리어 층에 사용되는 다음 다른 알 삼출액 세포를 사용하여 N *의 유속과 동일하거나 약간 더 높아야O 셀 온도를 변경할 필요가 없도록. 단계 3.2.4을 참조하십시오.
- 상기 N * 알 셔터를 닫고하지만 열린 조지아 셔터를 둡니다. 이 GaN 채널 온도까지 기판 온도를 램프.
- 30 초 후 조지아 셔터를 닫습니다. 다시 열어 조지아 셔터를합니다 (RHEED 강도가 증가하기 시작하자마자 나) 30 초를 기다립니다. 기판은 GaN으로 채널 성장 온도에 도달 할 때까지 사이클 조지아 셔터를 계속한다. 과도한 조지아 축적을 방지하면서이 표면을 보호합니다.
- 다음, 5 초 동안 조지아 셔터를 열고 N의 * 셔터를 열고이 GaN 채널을 성장.
- 조지아, N * 메인 셔터를 닫습니다. 200 ° C에 이르기까지 기판 온도를 램프 N 개의 * 플라즈마를 끄고 N 2 가스 흐름을 차단.
- 하루 완료하면 자신의 대기 온도에 세포를 램프 다운.
- 다음으로, 8 × 10-7 토르 이하가 250 ℃, 챔버 압력 이하로 감소시키기 위해, 기판 온도 기다리성장 챔버의 게이트 밸브를 개방하고 다시 트롤리에 웨이퍼 홀더 옮긴다.
- 다시로드 록에 웨이퍼를 전송하는 단계 2.2의 역을 따라, N 2 벤트와 웨이퍼를 제거합니다. 성장 챔버의 게이트 밸브가로드 록을 개방하기 전에 폐쇄되어 있는지 확인하고,로드 록 터보 펌프 게이트 밸브가 배출되기 전에 폐쇄된다.
- 단계에 따라 2.2.3-2.2.5 높은 진공 카세트 및로드 잠금을 반환 할 수 있습니다.
4. 특성
- 채널 성장하는 동안 형성 할 수있는 피트, 균열의 Ga 물방울, XRD는 계면 구조 품질을 확인하고, AFM 표면 형태를 확인하는 확인하기 위해 광학 현미경을 사용하여 재질의 특징. (20, 21)를
- 가인 소적이 존재하는 경우, 화학적으로 민감한 N 극성 표면을 손상시키지 않고 방울을 제거하기 위해 50-10 분 동안 농축 된 HF 산에 웨이퍼를 몰입.
- 시트 입술을 측정Lehighton 비접촉 저항 측정을 이용 istance.
- 홀과 CTLM 측정 및 DC 및 RF 트랜지스터 특성을 포함하여 전기적 특성을 수 있도록 샘플을 처리합니다. 9,26를
결과
X 선 회절 (XRD)도 4 N 극성의 GaN 기판상에서 성장한 도시 InAlN 박막의 스캔은 (a) 하나 둘 정점 (50)과 200 nm 두께의 필름. 50 nm 두께의 InAlN 필름의 XRD 스캔은 Pendellösung이 매우 높은 계면 품질을 나타내는 순서 번째 15까지 프린지 나타낸다. 도 4 비대칭 역 격자 공간 맵 (b)는 200 nm 두께 InAlN 층은 따라서 상당히 두꺼운 InA...
토론
고품질의 GaN 버퍼층의 성장은 III 족 질화물 HEMT 높은 전자 이동도를 달성하는 데 중요하다. 는 N 극성 InAlN HEMT의 경우에, 버퍼 층 성장은 모든 이전의 Ga InAlN 성장 표면으로부터 제거 될 필요 조건에 의해 복잡하게된다. 금속 변조 에피 (27)는 중간의 Ga 커버리지 조지아 액적 축적 체제 (28)의 가장자리에 성장 조건을 사용하거나 연속적인 N의 * 있도록 여기에 기재된 절차에 ?...
공개
The authors have nothing to disclose.
감사의 말
The authors thank Mr. Neil Green for assistance with sample preparation. This work was supported by the Office of Naval Research under funding from Dr. P. Maki. MTH was supported by a National Research Council Postdoctoral Fellowship.
자료
| Name | Company | Catalog Number | Comments |
| Freestanding N-polar GaN wafer | Kyma | 10 mm x 10 mm | |
| C-polar SiC wafer | Cree | W4TRE0R-L600 | 3 inch diameter |
| Microelectronics grade acetone | Fischer Scientific | A18-4 | |
| Microelectronics grade isoproponal | J.T. Baker | 9079-05/JT9079-5 | |
| Al source material (6N5 pure) | UMC | ALR62060I | |
| Ga source material (7N pure) | UMC | GA701 | |
| In source material (7N pure) | UMC | IN750 | |
| ULSI N2 source gas (6N pure) | Matheson Tri-gas | G2659906D | |
| PRO-75 MBE system | OmicronScientia |
참고문헌
- Hughes, W. C., et al. Molecular beam epitaxy growth and properties of GaN films on GaN/SiC substrates. J. Vac. Sci. Technol., B. 13 (4), 1571-1577 (1995).
- McSkimming, B. M., Wu, F., Huault, T., Chaix, C., Speck, J. S. Plasma assisted molecular beam epitaxy of GaN with growth rates 2.6 µm/hr. J. Cryst. Growth. 386, 168-174 (2014).
- Grandjean, N., Massies, J., Leroux, M. Nitridation of sapphire. Effect on the optical properties of GaN epitaxial overlayers. Appl. Phys. Lett. 69 (14), 2071-2073 (1996).
- Corrion, A. L., Wu, F., Speck, J. S. Growth regimes during homoepitaxial growth of GaN by ammonia molecular beam epitaxy. J. Appl. Phys. 112 (5), 054903 (2012).
- Mazumder, B., et al. Atom probe analysis of AlN interlayers in AlGaN/AlN/GaN heterostructures. Appl. Phys. Lett. 102 (11), 111603 (2013).
- Feezell, D. F., Speck, J. S., DenBaars, S. P., Nakamura, S. Semipolar (2021) InGaN/GaN Light-Emitting Diodes for High-Efficiency Solid State Lighting. J. Disp. Technol. 9 (4), (2013).
- Hardy, M. T., et al. True Green Semipolar InGaN-Based Laser Diodes Beyond Critical Thickness Limits Using Limited Area Epitaxy. J. Appl. Phys. 114 (18), 183101 (2013).
- Wong, M. H., et al. N-polar GaN epitaxy and high electron mobility transistors. Semicond. Sci. Technol. 28 (7), 074009 (2013).
- Hardy, M. T., et al. Charge control in N-polar InAlN high-electron-mobility transistors grown by plasma-assisted molecular beam epitaxy. J. Vac. Sci. Technol., B. 33 (6), 061207 (2015).
- Piquette, E. C., Bridger, P. M., Beach, R. A., McGill, T. C. Effect of Buffer Layer and III/V Ratio on the Surface Morphology of GaN Grown by MBE. Symposium G '-' GaN and Related Alloys. , (1998).
- Tarsa, E. J., et al. Homoepitaxial growth of GaN under Ga-stable and N-stable conditions by plasma-assisted molecular beam epitaxy. J. Appl. Phys. 82 (11), 5472-5479 (1997).
- Kuzmik, J. Power electronics on InAlN/(In)GaN: Prospect for a record performance. IEEE Electron Device Lett. 22 (11), 510-512 (2001).
- Fernández-Garrido, S., Gačević, &. #. 3. 8. 1. ;., Calleja, E. A comprehensive diagram to grow InAlN alloys by plasma-assisted molecular beam epitaxy. Appl. Phys. Lett. 93 (19), 191907 (2008).
- Katzer, D. S., et al. Molecular beam epitaxy of InAlN∕GaN heterostructures for high electron mobility transistors. J. Vac. Sci. Technol., B. 23 (3), 1204-1208 (2005).
- Kaun, S. W., et al. GaN-based high-electron-mobility transistor structures with homogeneous lattice-matched InAlN barriers grown by plasma-assisted molecular beam epitaxy. Semicond. Sci. Technol. 29 (4), 045011 (2014).
- Hoke, W. E., Torabi, A., Mosca, J. J., Kennedy, T. D. Thermodynamic analysis of cation incorporation during molecular beam epitaxy of nitride films using metal-rich growth conditions. J. Vac. Sci. Technol., B. 25 (3), 978-982 (2007).
- Koblmüller, G., Reurings, F., Tuomisto, F., Speck, J. S. Influence of Ga/N ratio on morphology, vacancies, and electrical transport in GaN grown by molecular beam epitaxy at high temperature. Appl. Phys. Lett. 97 (19), 191915 (2010).
- Zhou, L., Smith, D. J., McCartney, M. R., Katzer, D. S., Storm, D. F. Observation of vertical honeycomb structure in InAlN∕GaN heterostructures due to lateral phase separation. Appl. Phys. Lett. 90 (8), 081917 (2007).
- Ahmadi, E., et al. Elimination of columnar microstructure in N-face InAlN, lattice-matched to GaN, grown by plasma-assisted molecular beam epitaxy in the N-rich regime. Appl. Phys. Lett. 104 (7), 072107 (2014).
- Hardy, M. T., et al. Morphological and microstructural stability of N-polar InAlN thin films grown on free-standing GaN substrates by molecular beam epitaxy. J. Vac. Sci. Technol., A. 34 (2), 021512 (2016).
- Hardy, M. T., et al. Indium incorporation dynamics in N-polar InAlN thin films grown by plasma-assisted molecular beam epitaxy on freestanding GaN substrates. J. Cryst. Growth. 245, (2015).
- Leszczynski, M., et al. Indium incorporation into InGaN and InAlN layers grown by metalorganic vapor phase epitaxy. J. Cryst. Growth. 318 (1), 496-499 (2011).
- Storm, D. F., et al. Ultrathin-barrier AlN/GaN heterostructures grown by rf plasma-assisted molecular beam epitaxy on freestanding GaN substrates. J. Cryst. Growth. 380, 14-17 (2013).
- Storm, D. F., Katzer, D. S., Meyer, D. J., Binari, S. C. Oxygen incorporation in homoepitaxial N-polar GaN grown by radio frequency-plasma assisted molecular beam epitaxy: Mitigation and modeling. J. Appl. Phys. 112 (1), 013507 (2012).
- Storm, D. F., et al. Effect of interfacial oxygen on the microstructure of MBE-grown homoepitaxial N-polar. J. Cryst. Growth. 409, 14 (2014).
- Meyer, D. J., et al. High Electron Velocity Submicrometer AlN/GaN MOS-HEMTs on Freestanding GaN Substrates. IEEE Electron Device Lett. 34, 199 (2013).
- Moseley, M., Billingsley, D., Henderson, W., Trybus, E., Doolittle, W. A. Transient atomic behavior and surface kinetics of GaN. J. Appl. Phys. 106 (1), 014905 (2009).
- Koblmüller, G., et al. Ga Adlayer Governed Surface Defect Evolution of (0001)GaN Films Grown by Plasma-Assisted Molecular Beam Epitaxy. Jpn. J. Appl. Phys. 44 (28), L906-L908 (2005).
- Poblenz, C., Waltereit, P., Speck, J. S. Uniformity and control of surface morphology during growth of GaN by molecular beam epitaxy. J. Vac. Sci. Technol., B. 23 (4), 1379-1385 (2005).
재인쇄 및 허가
JoVE'article의 텍스트 или 그림을 다시 사용하시려면 허가 살펴보기
허가 살펴보기This article has been published
Video Coming Soon
Copyright © 2025 MyJoVE Corporation. 판권 소유