Method Article
气体夹膜的概念验证,源自爱水的SiO 2/Si/SiO2晶圆,用于绿色海水淡化
摘要
此处介绍了一种使用集成电路微加工技术从 SiO2/Si 晶圆中实现气体环膜 (GEM) 的逐步方案。当二氧化硅-GEM浸入水中时,尽管二氧化硅的成分是爱水的,但水的侵入是可以避免的。
摘要
通过直接接触膜蒸馏 (DCMD) 进行脱盐利用防水膜,将热和咸海水的逆流从冷水和纯净水中分离出来,从而只允许纯净水蒸气通过。为了实现这一壮举,商用DCMD膜源自或涂有防水全氟碳化合物,如聚四氟乙烯(PTFE)和聚氯乙烯(PVDF)。然而,全氟化碳的使用受到限制,因为全氟化碳成本高,不可生物降解,而且易受恶劣操作条件的影响。这里展示了一种新型的膜,称为气体诱膜(GEMs),在浸入水中时,它可以强力吸收空气。GEM 通过微观结构而不是化学结构来实现这一功能。这项工作展示了使用本质润湿的SiO 2/Si/SiO2晶圆作为模型系统的GEM的概念验证;SiO2上的水的接触角为±o = 40°。硅-GEM有300μm长的圆柱孔,其直径在(2μm长)入口和出口区域明显较小;这种几何不连续的结构,在入口和出口处有90°圈,被称为"重入微纹理"。二氧化硅-GEM的微制造方案包括设计、光刻、镀铬溅射以及各向异性和各向异性蚀刻。尽管二氧化硅具有爱水的性质,但水不会侵入二氧化硅-GEMs的浸没。事实上,它们强力地将空气困在水下,即使在六周后(>106秒)也能保持原状。另一方面,具有简单圆柱形孔隙的硅膜会自发地浸水(<1 s)。这些发现凸显了 GEM 架构在分离过程中的潜力。虽然为 GEM 选择 SiO2/Si/SiO2晶圆仅限于演示概念验证,但预计此处介绍的协议和概念将推动使用廉价通用材料进行海水淡化及超越的可扩展的 GEM 的合理设计。
引言
随着对水/粮食/能源/环境资源压力的升级,需要更环保的海水淡化技术和材料。在此背景下,直接接触膜蒸馏(DCMD)工艺可以利用太阳能热能或废工业热进行海水淡化3、4。DCMD利用防水膜将热海水和冷离子水的逆流分开,只允许纯水蒸气从热到冷的5、6、7、8、9。商用DCMD膜几乎完全利用全氟碳化物,因为它们的防水性,其特点是水的内在接触角,[o] 110°10。然而,全氟碳化合物是昂贵的,他们受到损坏在高温11和严酷的化学清洗12,13。它们的不可生物降解性也引起了环境问题14。因此,已经探索了DCMD的新材料,例如聚丙烯15、碳纳米管16和有机硅17,以及工艺的变化,例如界面加热18和光伏-MD19。然而,迄今为止,所有用于DCMD膜的研究材料本质上都是防水的,其特征是水的±o = 90°)。
本文描述了一种方案,用于利用爱水(亲水)材料来实现防水DCMD膜的功能,即通过在膜孔内牢固地将空气固定在两侧来分离水。在概念验证演示中,使用两侧具有二氧化硅层(2 μm 厚)的双面抛光硅片(SiO2/Si/SiO 2;2μm/300 μm/2 μm)。微制造工艺用于实现气体镶膜 (GEM),利用特定的结构防止液体进入孔隙,而不管表面化学如何。
GEMs建筑的灵感来源于春尾(科伦博拉),土壤栖息的六足动物,其角质含有蘑菇状图案20,21,和海滑者(Halobates德国),生活在开阔海洋中的昆虫,有蘑菇状的头发在他们的身体22,23。表面结构,连同自然分泌的蜡,为这些昆虫提供了"超级"水排斥,其特点是水的明显接触角(μr = 150°)24。因此,在休息状态下,海滑者基本上漂浮在海空界面22、25的空中。如果淹没在水中,它们会瞬间在身体周围捕获一层空气(也称为plastron),这有利于呼吸和浮力20,23。受到弹簧尾的启发,Kim和同事发现,带有蘑菇状柱状的硅表面可以击退表面张力低的液体液滴。这是一个了不起的发现;尽管如此,发现这些表面的液体排斥可能由于局部缺陷或边界27,28而灾难性地丧失。为了解决这个问题,研究人员用微制出的二氧化硅表面的空腔,其入口的直径突然比腔27的其余部分小(即,转90°)。这些特征也称为"重入"边,这些空腔以下简称"重入腔"。
重入腔在与液滴接触或浸没27时,会强有力地诱捕空气。将不同形状(圆形、方形和六边形)、轮廓(重入和双重进)和角的锐度与时间所夹住空气的稳定性之间的锐度进行了比较29。研究发现,圆形重入腔在润湿液体下气的鲁棒性以及与制造相关的复杂性方面是最佳的。此外,已经证明,具有重入腔的固固润润材料在浸润润湿液体时可以抑制空气,从而达到全磷表面的功能。基于这27、28、29、30的工作以及以前与DCMD31的经验,我们决定创建具有可重入入口和出口孔的膜。据设想,这种膜可以诱捕空气浸湿液体,由于其微纹理,产生GEM的想法。
考虑由由简单的圆柱孔组成的亲水材料制成的膜:当浸入水中时,此膜会自发地浸入水中(图1A,B)达到完全填充,或温泽尔状态32。另一方面,如果毛孔的入口和出口具有重入型(例如,"T"形),它们可能会阻止润湿液体穿透孔隙和内层空气,导致Cassie状态为33(图1C,D)。一旦空气被困在孔内,它将进一步防止液体入侵,由于其压缩性和低溶解度在水中的时间34,35。
这样的系统将缓慢地从卡西过渡到温泽尔状态,这个过程的动力学可以通过孔的形状、大小和轮廓、液体的蒸汽压力和液体中被困空气的溶解度来调整。研究人员已经能够实现使用硅片和聚甲基丙烯酸酯片作为测试基板的GEM,在交叉流配置中DCMD的概念验证应用已经演示了37个。这里给出了一个详细的硅-GEM生成微制造方案,从两侧硅层(2μm厚)的双面抛光硅片开始(SiO2/Si/SiO2;2μm/300 μm/2 μm)。此外,使用定制的压力单元和共聚焦显微镜评估二氧化硅-GEM在水下诱捕空气的能力。
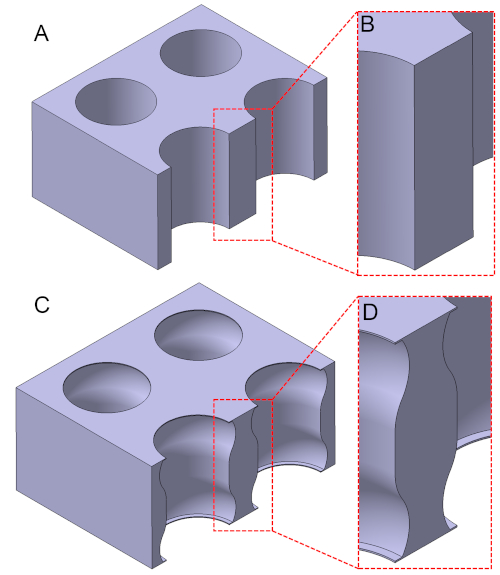
图1:具有简单圆柱孔(A、B)和重入孔(C、D)膜的原理图表示。与简单的圆柱形孔隙相比,重入孔在入口/出口后会急剧变宽,而正是这种不连续性(或重入边缘)可以防止液体侵入孔隙。请点击此处查看此图的较大版本。
特别是,本节描述了使用双面抛光硅片(p-掺杂,<<<<100>方向,直径4英寸,两侧2μm厚的热生长氧化物层)雕刻具有可重入入口和出口的孔隙阵列的微加工协议。这称为 SiO2(2 μm)/Si(300 μm)/SiO2(2 μm) (图 2)。

图2:流程图列出了硅-GEM微加工中涉及的关键步骤。请点击此处查看此图的较大版本。
研究方案
1. 设计
- 设计16个阵列,每个阵列包括625个圆(直径,D = 100 μm;间距,L = 400μm),以及使用适当的设计软件将校准标记转换为4"SiO2(2μm)/Si(300 μm)/SiO2(2μm)晶圆(参见材料表;图 3)38.
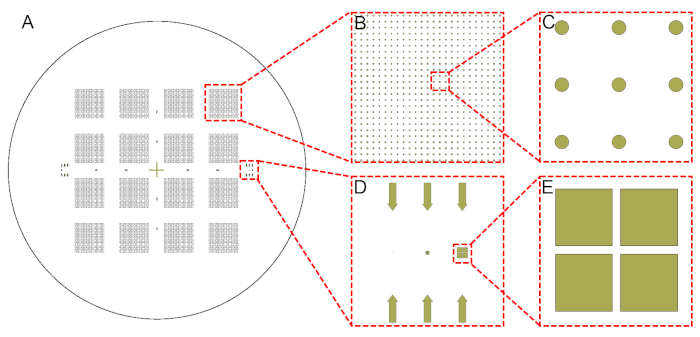
图3:圆形数组的设计。通过光刻,此设计模式被转移到 SiO2(2 μm)/Si(300 μm)/SiO2(2 μm) 晶圆上。显示的是 (A) 整个晶圆, (B,C) 放大视图, 和 (D,E) 对齐标记用于手动后对齐.请点击此处查看此图的较大版本。
- 通过直接书写系统中的紫外线照射(曝光时间 = 25 ms,散焦 = ±10),将特征转移到 5 英寸苏打石灰玻璃 (CaxHynazOn)上,面膜具有 50 nm 的铬涂层和光刻胶薄膜(正光刻;参见材料表)。
- 面具开发
- 将表面膜浸入 200 mL 的显影 (材料表) 中,以 60 s 遮盖下面的镶边,从而开发光刻胶。用去离子 (DI) 水清洗面罩。
- 将面膜浸入 200 mL 的镀铬蚀刻液浴中,以 90 s 清洗面膜,以去除裸露的铬。
- 执行紫外线泛洪暴露(即,不戴面具)15 s。
- 将光刻胶浸入 200 mL 的显影器中,直到光刻胶完全消失(60–120 s),从而完全从蒙版上去除光刻胶。用DI水清洁面罩表面,用氮气(N2)枪干燥。
2. 晶圆清洁
- 将硅晶片浸入新鲜制备的食人鱼溶液(H2SO4:H2O2 = 3:1 体积)中,在 388 K 的温度下保持 10 分钟。
注:在湿凳上使用食人鱼溶液时,请佩戴适当的个性化保护设备(PPE)。 - 用DI水冲洗晶圆,在湿台上两个循环,在N2环境下在旋转干燥器下干燥。
3. HMDS 沉积
- 将晶圆暴露于六甲基二甲烷 (HMDS) 的蒸气中,以提高光洁剂与二氧化硅表面的附着力(详见表 1)。
| 第1阶段:从室内脱水和清除氧气 | ||
| 步 | 功能 | 时间(分钟) |
| 1 | 真空 (10 托) | 1 |
| 2 | 氮气 (760 托尔) | 3 |
| 3 | 真空 (10 托) | 1 |
| 4 | 氮气 (760 托尔) | 3 |
| 5 | 真空 (10 托) | 1 |
| 6 | 氮气 (760 托尔) | 3 |
| 阶段 2: 启动 | ||
| 步 | 功能 | 时间(分钟) |
| 1 | 真空 (1 托) | 2 |
| 2 | HMDS (6 托) | 5 |
| 第 3 阶段:清除优质排气并返回大气(回填) | ||
| 步 | 功能 | 时间(分钟) |
| 1 | 真空 | 1 |
| 2 | 氮 | 2 |
| 3 | 真空 | 2 |
| 4 | 氮 | 3 |
表 1:HMDS 注油过程详细信息。
4. 平版印刷
- 将晶圆转移到旋转涂层的真空夹头上,以旋转涂覆光胶。使用 AZ 5214 光刻胶作为负色调,实现光刻胶 1.6 μm 厚的均匀膜(旋转涂层参数列在表 2中)。
注:AZ 5214可用作基于热处理(即预烘焙和烘焙后)的正色调或负色调光刻胶。如果在 110°C 预烘焙 2 分钟,光洁器会以正色调为正色调,因此暴露区域在开发过程中会溶解。对于负色调,光刻在105°C下预烘焙2分钟,然后紫外线照射,在120°C下烘烤2分钟。- 在热板上以105°C将光刻涂层晶圆烘烤2分钟。这会使光胶薄膜变干和硬化,否则光胶膜会粘在玻璃面罩上,在紫外线照射期间引起污染问题,还能提高光洁器与硅表面的附着力。
注:预烘烤温度不应过高,因为这可能导致光刻胶中感光的成分部分损坏,从而降低其灵敏度。
- 在热板上以105°C将光刻涂层晶圆烘烤2分钟。这会使光胶薄膜变干和硬化,否则光胶膜会粘在玻璃面罩上,在紫外线照射期间引起污染问题,还能提高光洁器与硅表面的附着力。
| 步 | 速度(转速) | 斜坡(rpm/s) | 时间(s) |
| 1 | 800 | 1000 | 3 |
| 2 | 1500 | 1500 | 3 |
| 3 | 3000 | 3000 | 30 |
表2:用于获得1.6μm光刻胶层的旋转涂层配方参数。
- 使用面膜对齐系统 (EVG 6200) 在紫外线照射下(80 mJ/cm2)将晶圆曝光 15 s,通过色光片罩,实现光刻胶上所需的设计。
- 在 120°C 的高温板上烘烤已实现的晶圆 2 分钟。在这一步骤中,曝光的负光刻胶膜进一步交叉。因此,光刻胶的紫外线照射部分不再溶于显影溶液,而未曝光的区域是可溶性的。
- 在紫外线固化系统(PRX-2000-20)中,在紫外线照射下(200 mJ/cm2)下进一步暴露15s的晶圆。
注: 在此步骤中,未暴露的光刻区域(步骤 4.3)会暴露,稍后可溶解在显影中,留下晶圆上所需的结构。此步骤可以容忍过度曝光,因为所需的特征(在负色调下)在烘焙后步骤后不再对光敏感。 - 将晶圆浸入 AZ-726 光刻胶显影板(玻璃器)的 50 mL 浴中,60 s,以实现硅晶圆上所需的光刻胶图案。
- 随后使用DI水清洁晶圆,并用N2进一步吹干晶圆。
5. 溅射
- 在晶圆上溅出铬200s,获得50nm厚的铬层。沉积使用磁控管型直流无功溅射在具有以下参数的 argon 环境中使用标准 2" 圆形目标源进行:400 V、电流 = 1 A 和压力 = 5 mTorr。
注:铬层可防止二氧化硅在八氟氯丁烷(C4F8)下进行干蚀蚀。
6. 光刻器升空
- 在丙酮浴中声波晶圆5分钟,从晶圆中提起剩余的光刻胶(和沉积在光刻胶上的铬),留下所需的铬硬面膜。
7. 晶圆另一侧的加工
- 用大量的丙酮和乙醇在晶圆背面洗去后,用N2枪吹干,然后重复步骤4.1和4.2。
8. 手动后退对齐
- 使用设计中的对齐标记和触点对齐器 (EVG 6200) 中的"手动后对齐"模块,将背面所需特征与晶圆正面对齐。
注:手动回对齐是微制造协议中的关键步骤。因此,必须有效地使用照片蒙版上设计的对齐功能,以避免孔隙对齐中的偏移。
9. 晶圆背面的平版
- 对于晶圆的背面,重复步骤 4.3_4.7、第 5 节和第 6 节,以生成所需的设计,在晶圆的两侧使用铬。请注意,表面覆盖着铬的部分不经过蚀刻;因此,晶圆上没有铬的斑点决定了孔隙的入口和出口。
10. 蚀刻
- 通过采用氟 (C4 F8)和氧 (O2)化学的电感耦合等离子体 (ICP) 活性电蚀刻器 (RIE) 对晶圆两侧外露的 SiO2层进行蚀刻。每侧持续时间为 16 分钟(表 3中列出的 ICP-RIE 参数)。
- 使用博世工艺用五个各向异性蚀刻循环处理晶圆,在硅层中创建凹槽。此过程的特点是使用 C4F8和六氟化硫 (SF6) 气体的交替沉积的扁平侧壁轮廓。通过交替各向异性蚀刻和聚合物沉积,硅蚀刻直下(表3中列出的蚀刻参数)。
- 将晶圆浸入食人鱼溶液(H2SO4:H 2 O2= 3:1 体积)的浴缸中,温度为 388 K 10 分钟。这消除了沉积在各向异性步长中的聚合物。
- 要创建产生重入型材的底切,请使用基于 SF6的配方进行各向异性蚀刻,持续时间为 165 s(表 3中列出的蚀刻参数)。
注: 此步骤在晶圆的每一侧执行。 - 各向异性硅蚀刻
- 使用博世工艺使用 200 个深度蚀刻周期将晶圆转移到深 ICP-RIE(牛津仪器)到蚀刻 150 μm 的硅(蚀刻参数列于表 3)。
- 用晶圆的背面重复步骤10.4.1。
- 在湿工作台上对晶圆进行 10 分钟的天人鱼清洁,以去除蚀刻过程中沉积的聚合物污染物,从而确保均匀的蚀刻速率。
- 重复步骤 10.4.1–10.4.3,通过具有可重入入口和插座的晶圆中的孔隙(可在光源下用肉眼可视化)实现。
- 将晶圆浸入 100 ml 的铬蚀刻槽中 60 s,以去除晶圆两侧的铬。
| 参数 | 硅蚀刻 | 各向异性硅蚀刻/周期 | 各向异性硅蚀刻 | |
| 沉积 | 蚀刻 | |||
| 射频功率 (W) | 100 | 5 | 30 | 20 |
| ICP 功率 (W) | 1500 | 1300 | 1300 | 1800 |
| 蚀刻压力(mTorr) | 10 | 30 | 30 | 35 |
| 温度 (°C) | 10 | 15 | 15 | 15 |
| C4F8流量(厘米) | 40 | 100 | 5 | - |
| O2流量(厘米) | 5 | - | - | - |
| SF6流量(厘米) | - | 5 | 100 | 110 |
| 蚀刻时间(s) | 960 | 5 | 7 | 165 |
表 3:SiO2/Si 干蚀刻的参数。
11. 最终清洁
- 微加工过程后,用100mL新鲜制备的食人鱼溶液(H2SO4:H2O2 = 3:1体积)清洁晶圆;T = 388 K)在玻璃容器中10分钟,然后用99%纯N2压力枪进一步吹干。
- 将样品放入 T = 323 K 的清洁真空烤箱内的玻璃培养皿中,直到光滑 SiO2上水的内在接触角稳定在±o = 40°(48 小时后)。
- 将获得的干样品(硅 GEM)存放在 N2机柜中。
注:整个制造工作流如图4所示。

图4:创业板微加工工艺的图解图。请点击此处查看此图的较大版本。
结果
本节介绍使用上述协议进行二氧化硅-GEMs微加工的水下性能。这些 GEM 的孔隙垂直对齐,入口/出口直径为 D = 100 μm,孔隙(间距)之间的中心到中心距离为L = 400 μm,重入边缘和壁之间的分离为w = 18 μm,孔隙的长度为h = 300 μm(图 5)。由于蚀刻步骤过程中发生不均匀和微加工过程中的微小错位,孔隙的中间部分与孔隙入口和出口下方的部分相比要窄一些,但是,对质量通量没有显著影响。
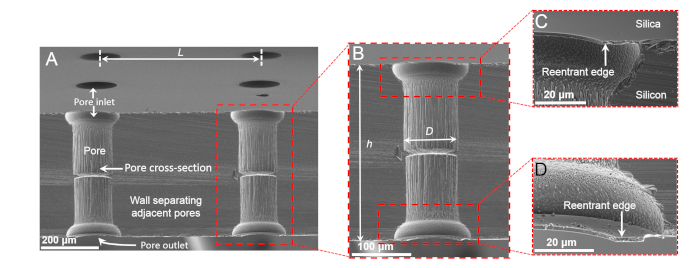
图5:扫描硅-GEM电子显微图。图所示为 (A) 硅-GEM 的倾斜横截面视图, (B) 单个孔隙的放大横截面视图, 和 (C,D) 在孔隙入口和出口处放大重入边缘的视图.面板(C)和(D)从Das等人重印37。请点击此处查看此图的较大版本。
将二氧化硅-GEM浸入水中
硅(SiO2)是亲水性的,其特征是水滴在饱和水蒸气下的内在接触角,[o] = 40°。 因此,如果在硅片上形成圆柱形孔隙,水会浸透它们,到达完全填充的孔隙,或温泽尔状态32。为了测试这一点,采用了一个定制的模块,可以在染色咸水(含食用色素的±0.6 M NaCl)和去离子水(T = 293 K 和p = 1 atm)之间固定测试膜。它还将去离子水库的电导率记录到计算机中,以监测原位孔填充情况(图6A)。在这里,具有简单圆柱孔的硅膜无法阻止两个储层的混合,因为水会瞬间渗入,如染料的释放所反映的(补充电影)。与此形成鲜明对比的是,在相同条件下测试二氧化硅-GEM时,它们牢固地将空气包裹起来,并保存6周以上,通过电导率测量(检测极限 = ± 0.01 μS/cm)确认,之后实验停止(图6B)。这些发现证明,GEM结构可以使亲水材料在浸入水中时能够强有力地吸收空气。此外,还提出了一个孔位场景,其中水中被夹住的空气的低溶解度和空气-水界面的曲率阻止了液体半月板进一步侵入孔隙(图6C)。

图6:膜鲁棒性测试。(A) 3D 打印定制电池的架构,用于测试膜的鲁棒性,将染色的咸水(含食用色素的 ±0.6 M NaCl)与纯去离子水(T = 293 K,p = 1 atm)分离,同时将 DI 储水箱的电导率记录到计算机中。(B) 当使用二氧化硅-GEM分隔两个储层时,DI储层电导率的半对数图超时。值得注意的是,硅-GEM在每个孔隙中牢固地夹住空气,使水在6周内无法穿透单个孔隙,电导率数据证明了这一点。(C) 孔径图,显示两端的空气-水接口。面板(A)和(B)从Das等人第37条重印。请点击此处查看此图的较大版本。
为了更深入地了解水下硅-GEM(±5 mm柱)入口(±5 mm柱)的空气-水界面的固定和位移,采用了共聚焦显微镜。众所周知,用于共聚焦显微镜照明的激光也会加热系统39,从而加速润湿过渡。然而,高空间分辨率可以产生有用的洞察力。为了进行比较,还调查了二氧化硅表面与重入腔的行为29,40。在这两种情况下,提供给上述储水箱的额外热量都会增强微纹理内水蒸气的毛细管冷凝。在重入腔的情况下,水蒸气的冷凝置换了被卡住的空气,导致空气-水界面向上膨胀,使系统不稳定(图7A,C)。在这些实验条件下,水在不到2小时内侵入所有腔体。相比之下,尽管加热速度相似,但硅-GEM在较长时期内仍无膨胀。这些结果在将水蒸气从激光加热储层优先冷凝到孔隙对面的冷空气-水界面的基础上进行了合理化(图7B,D)。然而,在这个实验配置中,无法测量质量转移速率。

图7:空气-水接口。(A) 在水下二氧化硅-GEMs入口(柱高,z = 5 mm;激光功率 = 0.6 mW)处对空气-水接口进行计算机增强的3D重建,并沿白色虚线(中央图像的左右两侧)进行横截面视图。由于顶部的激光加热,水蒸气在腔内凝结,取代夹住的空气。这导致气水半月板向上凸起,变得不稳定。1.5小时后,大部分空腔被水侵入。(B) 在类似条件下,在(A)条件下,将二氧化硅-GEM的共聚焦显像仪。(C) 在水下重入腔的情况下,空气-水半月板膨胀的图解。(D) 在类似条件下在硅-GEM中孔隙的原理图。热水蒸汽随处凝结,最显著的是离激光较远的一侧的较冷空气-水界面上。由于这种质量转移,孔隙中的压力会达到最小程度。请点击此处查看此图的较大版本。
与 GEM 直接接触膜蒸馏
在确定硅-GEM可以牢固地分离两侧的两个储水层后,测试了静态 DCMD 配置,其中含盐进料侧(T = 333 K 时为 0.6 M NaCl)和去离子渗透侧(T = 288 K)为静态储液罐。尽管硅-GEM防止了水的侵入,但未观察到可测量的通量。这是因为硅的导热性(k = 149 W-m-1 K -1)41比典型 DCMD 膜(即k <1 W-m-1-1-1)2) 的导热性高。因此,用二氧化硅-GEMs的实验设置遭受所谓的温度极化,其中热侧失去热量到冷侧,降低通量31。
通过纳米结构42(例如,提高其热电特性43),有可能降低硅的导热性,但这些途径没有被探索。相反,从二氧化硅-GEM的设计原则被翻译成聚甲基丙烯酸酯(PMMA)片([o] 70°用于水,k = 0.19 W-m-1-1 -1)40,以创建PMMA-GEMs37。事实上,第一批低孔隙度(0.08)的PMMA-GEM(概念验证)显示了进给侧和渗透的强强分离,在90小时内产生了1 L-m2-h-1的通量。因此,将这些基于硅-GEM 的研究转化为使用更常用的材料来生成更环保、成本更低的脱盐膜是可能的。
补充影片。请点击此处查看此文件(右键单击下载)。
讨论
这项工作介绍了硅-GEM的设计和制造,这是第一个从亲水材料中提取的DCMD膜。使用 SiO2/Si 系统的微加工提供了巨大的灵活性,可以创建微纹理来测试创意。当然,这项工作的范围仅限于 GEM 的概念验证,因为 SiO2/Si/Si/SiO2晶圆和洁净室微制造协议对于脱盐膜来说不切实际。
需要注意的是,即使当内在接触角为±o = 40°时,GEM 架构可以防止水在浸入时侵入,但如果表面具有超亲水性,则此策略失败。例如,暴露于氧等离子体后,二氧化硅表面会表现出±o = 5°,这些二氧化硅-GEM 会失去作为气泡自发地夹在孔隙中的空气,因为液体半月板不再固定在重入边缘。然而,常见的塑料,如聚乙烯醇([o ] = 51°) 和聚(乙烯三苯甲酸酯)(αo = 72°),应采用这种方法。因此,从硅-GEM中学到的设计原理可以使用三维打印44、增材制造45、激光微加工46和数控铣37等进行扩展。
接下来,讨论了硅-GEM微加工的一些关键方面,需要特别注意。特征的手动后对齐(第 8 部分)应尽可能小心地执行,以实现垂直对齐的孔隙。偏移可能导致孔喉,在最坏的情况下,错位可能导致两侧仅出现腔(无孔隙)。因此,建议使用多比例对齐标记,最小对齐标记至少比孔径小四倍。
在使用 C4F8和 O2(步骤 10.1)的硅层蚀刻过程中,反应室的先前使用(即清洁度)会影响蚀刻速率。这是因为反应室中存在污染物,这在大学等共享用户设施中很常见。因此,建议首先在虚拟晶圆上执行此步骤,以确保系统清洁稳定。此外,建议使用短时间进行蚀刻(例如,使用反射测量监测硅层厚度时不超过 5 分钟)。例如,如果从 SiO2/Si/SiO2晶圆中完全去除 2 μm SiO2层需要 16 分钟,则蚀刻过程应分为四个步骤,包括三个 5 分钟周期,然后是反射测量,以及一个 1 分钟(可选)蚀刻步骤,基于反射测量结果。
为了在博世工艺中保留用于蚀刻硅层的二氧化硅重入特性(步骤 10.4),使用铬硬膜至关重要。博世工艺需要沉积 C4F8以确保各向异性轮廓。但是,在长时间的蚀刻周期中,此层可能会变得非常厚且难以去除。因此,建议博世流程的运行周期不应超过 200 个周期,之后应进行食人鱼清洁。还观察到,尽管有铬硬面膜,但深蚀刻周期长也会降低硅层的厚度。
就蚀刻速率而言,大多数干蚀刻工具都无法实现空间均匀性。因此,在 SiO2/Si/Si2晶圆中心获得的特性可能与晶圆边界处的特性不同。在这里,在4英寸晶圆的中心实现了高质量的特征,并在显微镜下定期观察样品。如果某些区域的蚀刻比其他地区多,则晶圆应被分解成应单独蚀刻的碎片。
本制造方案可应用于任何厚度的SiO 2/Si/SiO2晶圆;但是,较厚的层意味着需要较多的蚀刻周期。建议使用厚度为<300 μm的硅晶片,只要在搬运和表征过程中不损害晶圆的机械完整性。
披露声明
R.D.、S.A.和H.M.已提交国际专利,申请号PCT/IB2019/054548。
致谢
H.M. 感谢阿卜杜拉国王科技大学在 BAS/1/1070-01-01 和 KAUST 下为纳米制造核心实验室设施提供的资金。
材料
| Name | Company | Catalog Number | Comments |
| 3D Printer | BCN3D | 020.180510.3103 | BCN3D Sigma 3D printer for printing test module with PLA (polylactic acid) filament. |
| Acetone | BASF | ||
| AZ-5214 E photoresist | Merck | ||
| AZ-726 MIF developer | Merck | ||
| Chrome Etchant | MicroChemicals | TechniEtch Cr01 | To remove chromium from silicon wafer and mask |
| Conductivity Meter | Hanna | HI98192 | To measure conductivity of pure water during leak testing. |
| Confocal microscope | Zeiss | ZEISS LSM 710 | For fluorescence imaging of water. |
| Contact Aligner | EVG | EVG6200 | Mask aligner |
| Deep ICP-RIE | Oxford Instruments | Plasmalab system100 | |
| DI water | |||
| Direct writer | Heidelberg Instruments | µPG501 direct-writing system | UV exposure |
| Food Dye | Kroger | Green food dye to label salty water. | |
| Glass Petri dish | VWR | ||
| HMDS vapor prime | Yield Engineering systems | ||
| Hot plate | Cost effective equipments | Model 1300 | |
| Hydrogen peroxide 30% | VWR chemicals | To prepare piranha solution. | |
| Imaris software | Bitplane | Version 8 | Postprocess confocal microscopy images |
| Nitrogen gas | |||
| Optical surface profiler | Zygo | Zygo newview 7300 | |
| Photomask | Nanofilm | 5-inch soda lime glass mask | |
| Profilometer | Veeco | Detak 8 | Stylus profilometer |
| Reactive Sputter | Equipment Support Company Ltd | Chromium sputtering | |
| Reactive-Ion Etching (RIE) | Oxford Instruments | Plasmalab system100 | |
| Reflectometer | Nanometrics | Nanospec 6100 | To check remaining oxide layer thickness. |
| Rhodamine B | Merck | 81-88-9 | Dye for imaging water meniscus under confocal microscope. |
| SEM stub | Electron Microscopy Sciences | ||
| SEM-Quanta 3D | FEI | Quanta 3D FEG Dual Beam (SEM/FIB) | |
| Silicon wafer | Silicon Valley Microelectronics | Double side polished, 4" diamater, 300 µm thickness, 2 µm thick oxide layer, p-doped, <100> orientation. | |
| Sodium Chloride | Merck | 7647-14-5 | For preparing NaCl solution |
| Sonicator | Branson | 1510 | |
| Spin coater | Headway Research,Inc. | ||
| Spin dryer | MicroProcess | Avenger Ultra Pure 6 | Spin drying in Nitrogen environment. |
| Sputter | Quorum Technologies | Q150T S | Iridium sputter for SEM. |
| Sulfuric acid 96% | Technic | 764-93-9 | To prepare piranha solution. |
| Tanner EDA L-Edit software | Tanner EDA, Inc. | For designing photomask | |
| Tweezers | Excelta | ||
| UV Cure | Tamarack Scientific Co. Inc. | PRX-2000-20 | For flood exposure of wafer and photomask |
| Vaccum oven | Thermo Scientific | 13-258-13 | Lindberg/Blue M |
| Wet bench | JST Manufacturing Inc. | 17391-015-00 | Wet bench used for piranha cleaning |
参考文献
- Fisher, J. B., et al. The future of evapotranspiration: Global requirements for ecosystem functioning, carbon and climate feedbacks, agricultural management, and water resources. Water Resources Research. 53 (4), 2618-2626 (2017).
- Deshmukh, A., et al. Membrane distillation at the water-energy nexus: limits, opportunities, and challenges. Energy & Environmental Science. 11 (5), 1177-1196 (2018).
- Ali, A., Tufa, R. A., Macedonio, F., Curcio, E., Drioli, E. Membrane technology in renewable-energy-driven desalination. Renewable and Sustainable Energy Reviews. 81, 1-21 (2018).
- Ghaffour, N., et al. Renewable energy-driven innovative energy-efficient desalination technologies. Applied Energy. 136, 1155-1165 (2014).
- Chen, J., et al. Recovery of dilute aqueous butanol by membrane vapor extraction with dodecane or mesitylene. Journal of Membrane Science. 528, 103-111 (2017).
- Wang, P., Chung, T. -S. Recent advances in membrane distillation processes: Membrane development, configuration design and application exploring. Journal of Membrane Science. 474, 39-56 (2015).
- Khayet, M. Membranes and theoretical modeling of membrane distillation: A review. Advances in Colloid and Interface Science. 164 (1-2), 56-88 (2011).
- Drioli, E., Ali, A., Macedonio, F. Membrane distillation: Recent developments and perspectives. Desalination. 356, 56-84 (2015).
- Souhaimi, M. K., Matsuura, T. Membrane Distillation. 1st edn. , Elsevier. (2011).
- Janssen, D., De Palma, R., Verlaak, S., Heremans, P., Dehaen, W. Static solvent contact angle measurements, surface free energy and wettability determination of various self-assembled monolayers on silicon dioxide. Thin Solid Films. 515 (4), 1433-1438 (2006).
- Hendren, Z. D., Brant, J., Wiesner, M. R. Surface modification of nanostructured ceramic membranes for direct contact membrane distillation. Journal of Membrane Science. 331 (1-2), 1-10 (2009).
- Verho, T., et al. Mechanically Durable Superhydrophobic Surfaces. Advanced Materials. 23, 673-678 (2011).
- Boinovich, L., Emelyanenko, A. M., Pashinin, A. S. Analysis of Long-Term Durability of Superhydrophobic Properties under Continuous Contact with Water. ACS Applied Materials & Interfaces. 2 (6), 1754-1758 (2010).
- Lindstrom, A. B., Strynar, M. J., Libelo, E. L. Polyfluorinated compounds: past, present, and future. Environmental Science & Technology. 45 (19), 7954-7961 (2011).
- Gryta, M. Influence of polypropylene membrane surface porosity on the performance of membrane distillation process. Journal of Membrane Science. 287 (1), 67-78 (2007).
- An, A. K., et al. Enhanced vapor transport in membrane distillation via functionalized carbon nanotubes anchored into electrospun nanofibres. Scientific Reports. 7, (2017).
- Hammami, M. A., et al. Engineering Hydrophobic Organosilica Nanoparticle-Doped Nanofibers for Enhanced and Fouling Resistant Membrane Distillation. ACS Applied Materials & Interfaces. 9 (2), 1737-1745 (2017).
- Shi, Y., et al. A 3D Photothermal Structure toward Improved Energy Efficiency in Solar Steam Generation. Joule. 2 (6), 1171-1186 (2018).
- Wang, W., et al. Simultaneous production of fresh water and electricity via multistage solar photovoltaic membrane distillation. Nature Communications. 10 (1), 3012(2019).
- Hensel, R., Neinhuis, C., Werner, C. The springtail cuticle as a blueprint for omniphobic surfaces. Chemical Society Reviews. 45 (2), 323-341 (2016).
- Helbig, R., Nickerl, J., Neinhuis, C., Werner, C. Smart Skin Patterns Protect Springtails. PLoS ONE. 6 (9), 25105(2011).
- Andersen, N. M., Cheng, L. The marine insect Halobates (Heteroptera: Gerridae): biology, adaptations, distribution, and phylogeny. Oceanography and Marine biology: an Annual Review. 42, 119-180 (2004).
- Cheng, L. Marine and Freshwater Skaters: Differences in Surface Fine Structures. Nature. 242, 132(1973).
- Gao, X., Jiang, L. Water-repellent legs of water striders. Nature. 432 (7013), 36(2004).
- Golovin, K. B., Gose, J., Perlin, M., Ceccio, S. L., Tuteja, A. Bioinspired surfaces for turbulent drag reduction. Philosophical Transactions of the Royal Society A - Mathematical Physical and Engineering Sciences. 374 (2073), (2016).
- Liu, T. Y., Kim, C. J. Turning a surface superrepellent even to completely wetting liquids. Science. 346 (6213), 1096-1100 (2014).
- Domingues, E. M., Arunachalam, S., Mishra, H. Doubly Reentrant Cavities Prevent Catastrophic Wetting Transitions on Intrinsically Wetting Surfaces. ACS Applied Materials & Interfaces. 9 (25), 21532-21538 (2017).
- Arunachalam, S., Das, R., Nauruzbayeva, J., Domingues, E. M., Mishra, H. Assessing omniphobicity by immersion. Journal of Colloid and Interface Science. 534, 156-162 (2019).
- Domingues, E. M., Arunachalam, S., Nauruzbayeva, J., Mishra, H. Biomimetic coating-free surfaces for long-term entrapment of air under wetting liquids. Nature Communications. 9 (1), 3606(2018).
- Gonzalez-Avila, S. R., Nguyen, D. M., Arunachalam, S., Domingues, E. M., Mishra, H., Ohl, C. D. Mitigating cavitation erosion using biomimetic gas-entrapping microtextured surfaces. Science Advances. , in press (2020).
- Subramanian, N., et al. Evaluating the potential of superhydrophobic nanoporous alumina membranes for direct contact membrane distillation. Journal of Colloid and Interface Science. 533, 723-732 (2019).
- Wenzel, R. N. Resistance of solid surface to wetting by water. Industrial and Engineering Chemistry. 28 (8), 7(1936).
- Cassie, A. B. D., Baxter, S. Wettability of porous surfaces. Transactions of the Faraday Society. 40, 0546-0550 (1944).
- Kaufman, Y., et al. Simple-to-Apply Wetting Model to Predict Thermodynamically Stable and Metastable Contact Angles on Textured/Rough/Patterned Surfaces. The Journal of Physical Chemistry C. 121 (10), 5642-5656 (2017).
- Mishra, H., et al. Time-Dependent Wetting Behavior of PDMS Surfaces with Bioinspired, Hierarchical Structures. ACS Applied Materials & Interfaces. 8 (12), 8168-8174 (2016).
- Seo, D., et al. Rates of cavity filling by liquids. Proceedings of the National Academy of Sciences. , (2018).
- Das, R., Arunachalam, S., Ahmad, Z., Manalastas, E., Mishra, H. Bio-inspired gas-entrapping membranes (GEMs) derived from common water-wet materials for green desalination. Journal of Membrane Science. 588, 117185(2019).
- Tanner Research. Manual, L.-E.U. , Tanner Research, Inc. (1996).
- Xu, M. C., Sun, G. U., Kim, C. J. Infinite Lifetime of Underwater Superhydrophobic States. Physical Review Letters. 113 (13), (2014).
- Arunachalam, S., Domingues, E. M., Das, R., Nauruzbayeva, J., Buttner, U., Syed, A., Mishra, H. Rendering SiO2/Si Surfaces Omniphobic by Carving Gas-Entrapping Microtextures Comprising Reentrant and Doubly Reentrant Cavities or Pillars. Journal of Visualized Experiments. , e60403(2020).
- Dean, J. A. Lange's Handbook of Chemistry. , McGraw-Hill, Inc. New York; London. (1999).
- Yu, J. K., Mitrovic, S., Tham, D., Varghese, J., Heath, J. R. Reduction of thermal conductivity in phononic nanomesh structures. Nature Nanotechnology. 5 (10), 718-721 (2010).
- Mishra, H., et al. Thermomechanical and Thermal Contact Characteristics of Bismuth Telluride Films Electrodeposited on Carbon Nanotube Arrays. Advanced Materials. 21 (42), 4280(2009).
- Liu, X., et al. 3D Printing of Bioinspired Liquid Superrepellent Structures. Advanced Materials. 0 (0), 1800103(2018).
- Jafari, R., Cloutier, C., Allahdini, A., Momen, G. Recent progress and challenges with 3D printing of patterned hydrophobic and superhydrophobic surfaces. The International Journal of Advanced Manufacturing Technology. , 1-14 (2019).
- Vorobyev, A., Guo, C. Multifunctional surfaces produced by femtosecond laser pulses. Journal of Applied Physics. 117 (3), 033103(2015).
转载和许可
请求许可使用此 JoVE 文章的文本或图形
请求许可探索更多文章
This article has been published
Video Coming Soon
版权所属 © 2025 MyJoVE 公司版权所有,本公司不涉及任何医疗业务和医疗服务。