Method Article
Preuve de concept pour les membranes d’enpiçage au gaz dérivées de L’eau-Aimant SiO2/Si/SiO2 Wafers pour le dessalement vert
Dans cet article
Résumé
Présenté ici est un protocole étape pour la réalisation des membranes de piégeage des gaz (GEM) à partir de plaquettes SiO2/Si en utilisant la technologie intégrée de microfabrication de circuits. Lorsque les silice-GEM sont immergés dans l’eau, l’intrusion d’eau est empêchée, malgré la composition épris d’eau de la silice.
Résumé
Le dessalement par distillation de membrane de contact direct (DCMD) exploite les membranes hydrofuges pour séparer solidement les flux d’eau de mer chaude et salée de l’eau froide et pure, permettant ainsi que de la vapeur d’eau pure de passer à travers. Pour réaliser cet exploit, les membranes commerciales de DCMD sont dérivées ou enduites de perfluorocarbones hydrofuges comme le polytétrafluoroéthylène (PTFE) et le difluorure de polyvinylidene (PVDF). Cependant, l’utilisation des perfluorocarbures est limitée en raison de leur coût élevé, de leur non-biodégradabilité et de leur vulnérabilité à des conditions opérationnelles difficiles. Dévoilée ici est une nouvelle classe de membranes appelées membranes de piégeage de gaz (GEM) qui peuvent solidement piéger l’air lors de l’immersion dans l’eau. Les GEM atteignent cette fonction par leur microstructure plutôt que par leur composition chimique. Ce travail démontre une preuve de concept pour les GEM en utilisant intrinsèquement mouillant siO2/Si/SiO2 gaufrettes comme système modèle; l’angle de contact de l’eau sur SiO2 est de40 euros. Les Silica-GEM avaient 300 pores cylindriques de 300 m de long dont les diamètres dans les régions d’inlet et de sortie (2 m de long) étaient significativement plus petits; cette structure géométriquement discontinue, avec des virages à 90 degrés aux entrées et aux prises, est connue sous le nom de « microtexture entrante ». Le protocole de microfabrication pour la silice-GEMs implique la conception, la photolithographie, le pulvérisage de chrome, et la gravure isotropique et anisotropique. Malgré la nature épris d’eau de la silice, l’eau n’empiète pas sur la silice-GEMs sur la submersion. En fait, ils piègent solidement l’air sous l’eau et le gardent intact même après six semaines (106 secondes). D’autre part, les membranes de silice avec des pores cylindriques simples absorbent spontanément l’eau (lt; 1 s). Ces résultats mettent en évidence le potentiel de l’architecture GEMs pour les processus de séparation. Bien que le choix des gaufrettes SiO2/Si/SiO2 pour les GEM se limite à démontrer la preuve de concept, on s’attend à ce que les protocoles et les concepts présentés ici feront progresser la conception rationnelle des GEM évolutives utilisant des matériaux communs peu coûteux pour le dessalement et au-delà.
Introduction
À mesure que le stress sur les ressources en eau/alimentaire/énergie/environnement s’intensifie, des technologies et des matériaux plus écologiques pour le dessalement sont nécessaires1,2. Dans ce contexte, le processus de distillation de membrane de contact direct (DCMD) peut utiliser l’énergie solaire-thermique ou la chaleur industrielle de déchets pour le dessalement del’eau 3,4. DCMD exploite les membranes hydrofuges pour séparer les flux de contre-courant de l’eau de mer chaude et de l’eau froide déionisée, permettant seulement la vapeur d’eau pure de transporter à travers du côté chaud au froid5,6,7,8,9. Les membranes commerciales de DCMD exploitent presque exclusivement les perfluorocarbures en raison de leur répulsif en eau, caractérisé par l’angle de contact intrinsèque de l’eau, o110 '10. Cependant, les perfluorocarbures sont chers, et ils sont endommagés à des températures élevées11 et sur le nettoyage chimique sévère12,13. Leur non-biodégradabilité soulève également des préoccupations environnementales14. Ainsi, de nouveaux matériaux pour DCMD ont été explorés, par exemple, le polypropylène15, nanotubes de carbone16, et organosilica17, avec des variations du processus, par exemple, le chauffage interfacial18 et photovoltaïque-MD19. Néanmoins, tous les matériaux étudiés pour les membranes DCMD jusqu’à présent ont été intrinsèquement hydrofuge, caractérisé par 'o '90 ' pour l’eau).
Ici, un protocole est décrit pour exploiter les matériaux hydrophiles (hydrophiles) aimant l’eau pour atteindre la fonction des membranes DCMD hydrofuges, c’est-à-d. séparant l’eau de chaque côté en piégeant solidement l’air à l’intérieur des pores de la membrane. Vers la démonstration de preuve de concept, des plaquettes de silicium poli à double face avec des couches de silice (2 m d’épaisseur) des deux côtés (SiO2/Si/SiO2; 2 m/300 m/2 m, respectivement) sont utilisées. Des procédés de microfabrication sont appliqués pour atteindre les membranes de piégeage des gaz (GEM), qui exploitent une architecture spécifique pour empêcher les liquides d’entrer dans les pores indépendamment de la chimie de surface.
L’inspiration pour l’architecture GEMs provenait de springtails (Collembola), héxapodes vivant dans le sol dont les cuticules contiennent des motifs en forme de champignon20,21 , et les patineurs de mer (Halobates germanus), insectes vivant en haute mer qui ont des cheveux en forme de champignon sur leur corps22,23. L’architecture de surface, ainsi que les cires naturellement sécrétées, offre à ces insectes une « super » répulsif en eau, caractérisée par des angles de contact apparents pour l’eau(r' 150 ')24. En conséquence, dans leur état de repos, les patineurs de mer flottent essentiellement dans l’air à l’interface air de mer22,25. S’ils sont immergés dans l’eau, ils emprisonnent instantanément une couche d’air autour de leur corps (également connu sous le nom de plastron), ce qui facilite la respiration et la flottabilité20,23. Inspirés par les queues de printemps, Kim et ses collègues ont montré que les surfaces de silice avec des rangées de piliers en forme de champignon peuvent repousser les gouttelettes de liquides avec de faibles tensions de surface26. Ce fut une découverte remarquable; cependant, il a été constaté que la répulsion liquide de ces surfaces pouvait être perdue de façon catastrophique par des défauts ou des limites localisées27,28. Pour remédier à ce problème, les chercheurs ont microfabriqué des surfaces de silice avec des cavités dont les diamètres aux entrées étaient brusquement plus petits (c.-à-d., avec un tour de 90 degrés) que le reste de la cavité27. Ces caractéristiques sont également connues sous le nom de bords « entrants », et les cavités sont appelées ci-après « cavités de réentrer ».
Les cavités de réinsègue piègent solidement l’air au contact des gouttes liquides ou à la submersion27. La performance des cavités de différentes formes (circulaires, carrées et hexagonales), les profils (reentrant et doublement reentrant), et la netteté des coins par rapport à la stabilité de l’air emprisonné au fil du temps a été comparée29. Il a été constaté que les cavités circulaires de réentrant sont les plus optimales en termes de robustesse pour le piégeage de l’air sous les liquides mouillants et la complexité associée à la fabrication. En outre, il a été démontré que les matériaux intrinsèquement mouillants avec des cavités de réentrant peuvent piéger l’air lors de l’immersion dans les liquides mouillants, et ainsi, atteindre la fonction des surfaces omniphobes. Sur la base de ce corpus de travail27,28,29,30 et l’expérience précédente avec DCMD31, nous avons décidé de créer des membranes qui ont des pores avec des entrées et des prises de réentrant. Il a été envisagé qu’une telle membrane pourrait piéger l’air lors de l’immersion dans les liquides mouillants en raison de sa microtexture, donnant lieu à l’idée de GEMs.
Considérez une membrane faite à partir d’un matériau hydrophile comprenant de simples pores cylindriques : lorsqu’elle est immergée dans l’eau, cette membrane imbibe de l’eau spontanément (Figure 1A,B) atteignant l’état de Wenzelrempli 32. D’autre part, si les entrées et les sorties des pores ont des profils de réentrant (par exemple, en forme de « T »), ils peuvent empêcher le liquide mouillant de pénétrer les pores et piéger l’air à l’intérieur, ce qui conduit à des états cassie33 (figure 1C,D). Une fois que l’air est emprisonné à l’intérieur du pore, il permettra d’éviter davantage l’intrusion liquide en raison de sa compressibilité et sa faible solubilité dans l’eau au fil du temps34,35.
Un tel système va lentement passer de Cassie à l’état de Wenzel, et la cinétique de ce processus peut être réglé par la forme, la taille et le profil du pore, la pression de vapeur du liquide, et la solubilité de l’air emprisonné dans le liquide29,34,36. Les chercheurs ont été en mesure de réaliser GEMs en utilisant des plaquettes de silicium et des feuilles de polyméthylmethacrylate que les substrats d’essai, et des applications de preuve de concept pour DCMD dans une configuration de flux croisé s’est démontré37. Ici, un protocole détaillé de microfabrication pour la génération de silice-GEMs est présenté, en commençant par des gaufrettes de silicium poli à double face avec des couches de silice (2 m d’épaisseur) des deux côtés (SiO2/Si/SiO2;2 m/300 m/2 m, respectivement). En outre, la capacité des silice-GEMs à piéger l’air sous l’eau est évaluée à l’aide d’une cellule de pression sur mesure et d’une microscopie confocale.
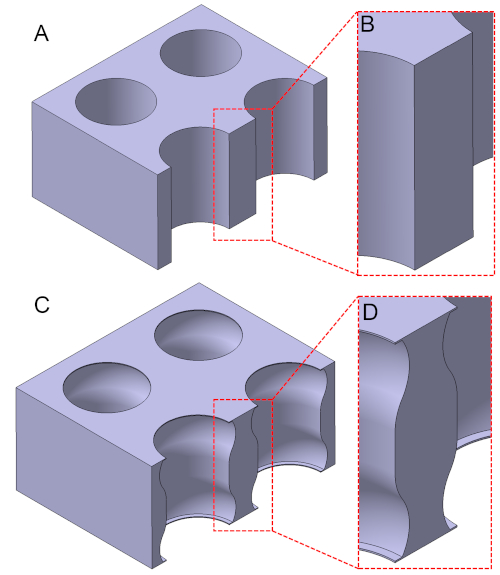
Figure 1 : Représentation schématique d’une membrane avec des pores cylindriques simples (A,B) et une avec des pores de réentrant (C,D). Contrairement aux pores cylindriques simples, les pores de réentrant deviennent nettement plus larges après les entrées/prises, et c’est cette discontinuité (ou les bords de reentrant) qui empêche les liquides de s’immiscer dans les pores. Veuillez cliquer ici pour voir une version plus grande de ce chiffre.
En particulier, cette section décrit le protocole de microfabrication pour la sculpture des tableaux de pores avec des entrées et des prises de reentrant à l’aide de plaquettes de silicium poli à double face qui sont de 300 m d’épaisseur (p-dopé, lt;100 'gt; orientation, 4 " diamètre, 2 couches d’oxyde thermiquede d’épaisseur de 2 m d’épaisseur sur les deux côtés). C’est ce qu’on appelle ci-après SiO2(2 m)/Si(300 m)/SiO2(2 m) (Figure 2).

Figure 2 : Flowchart répertorie les étapes clés de la microfabrication de silice-GEM. Veuillez cliquer ici pour voir une version plus grande de ce chiffre.
Protocole
1. Conception
- Concevoir 16 tableaux, chacun comprenant 625 cercles (diamètre, D 100 m; hauteur, L 400 m), ainsi que des marques d’alignement à traduire sur 4" SiO2(2 m)/Si (300 m)/SiO2(2 m) de gaufrettes à l’aide d’un logiciel de conception approprié (voir Tableau des matériaux; Figure 3) 38.
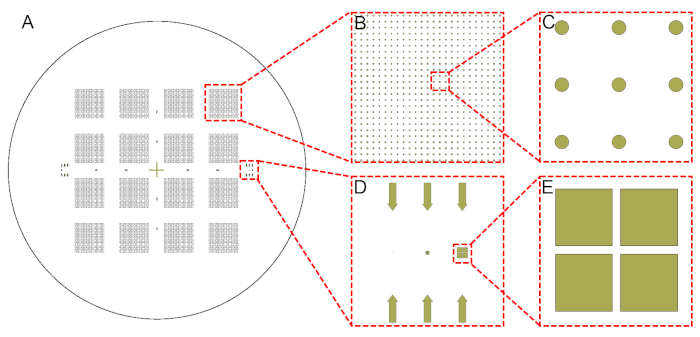
Figure 3 : Conceptions de tableaux circulaires. Ce modèle de conception a été transféré sur les gaufrettes SiO2(2 m)/Si(300 m)/SiO2(2 m) par photolithographie. Sont montrés sont (A) l’ensemble des gaufrettes, (B,C) vues zoomées, et (D,E) marques d’alignement utilisés pour l’alignement manuel de retour. Veuillez cliquer ici pour voir une version plus grande de ce chiffre.
- Transférer des caractéristiques sur un verre à la chaux de soude de 5 po (CaxHyNazOn) masque avec un revêtement de 50 nm de chrome et un mince film de photoresist (un photoresist positif; voir Table of Materials) par l’exposition aux UV dans un système d’écriture directe (temps d’exposition de 25 ms, défocus - 10).
- Développement de masques
- Développer le photoresist en immergeant le masque dans 200 ml de développeur (Table of Materials) pour 60 s pour exposer le chrome en dessous. Laver le masque avec de l’eau déionisée (DI).
- Retirez le chrome exposé en immergeant le masque dans un bain de 200 ml d’étchanter chromé pendant 90 s. Lavez le masque avec de l’eau DI.
- Effectuer une exposition aux inondations UV (c.-à-d. sans masque) pendant 15 s.
- Retirez complètement le photoresist du masque en plongeant dans un bain de 200 ml de développeur jusqu’à ce que le photoresist disparaisse complètement (60 à 120 s). Nettoyez la surface du masque avec de l’eau DI et séchez à l’aide d’un pistolet à azote (N2).
2. Nettoyage Wafer
- Immerger la plaquette de silicium dans une solution de piranha fraîchement préparée (H2SO4:H2O2 - 3:1 en volume) maintenue à une température de 388 K pendant 10 min.
REMARQUE : Portez un équipement de protection personnalisé (EPI) approprié tout en travaillant avec la solution piranha sur le banc mouillé. - Rincer la plaquette avec de l’eau DI, deux cycles dans un banc humide, et le sécher sous un environnement N2 dans le sèche-cheveux.
3. Dépôt HMDS
- Exposer la plaquette à la vapeur de hexamethyldisilane (HMDS) pour améliorer l’adhérence du photoresist avec la surface de silice (détails dans le tableau 1).
| Étape 1 : Déshydratation et purge de l’oxygène de la chambre | ||
| Étape | Fonction | Temps (min) |
| 1 | Vide (10 Torr) | 1 |
| 2 | Azote (760 Torr) | 3 |
| 3 | Vide (10 Torr) | 1 |
| 4 | Azote (760 Torr) | 3 |
| 5 | Vide (10 Torr) | 1 |
| 6 | Azote (760 Torr) | 3 |
| Étape 2 : Priming | ||
| Étape | Fonction | Temps (min) |
| 1 | Vide (1 Torr) | 2 |
| 2 | HMDS (6 Torr) | 5 |
| Étape 3 : Purging Prime Exhaust and Return to Atmosphere (Backfill) | ||
| Étape | Fonction | Temps (min) |
| 1 | Vide | 1 |
| 2 | Azote | 2 |
| 3 | Vide | 2 |
| 4 | Azote | 3 |
Tableau 1 : Détails du processus d’amorçage HMDS.
4. Lithographie
- Transférer la plaquette sur un vide-chuck d’un enduit de spin pour faire tourner manteau le photoresist. Utilisez le photoresist AZ 5214 comme tonalité négative pour obtenir un film uniforme de 1,6 m d’épaisseur du photoresist (les paramètres de revêtement de spin sont énumérés dans le tableau 2).
REMARQUE : L’AZ 5214 peut être utilisé comme photorésistant à tonalité positive ou négative en fonction du traitement thermique (c.-à-d. pré-cuisson et post-cuisson). S’il est précuit à 110 oC pendant 2 min, le photoresist se comporte comme un ton positif, de sorte que les zones exposées se dissolvent pendant le développement. Pour le ton négatif, le photoresist est précuit à 105 oC pendant 2 min, suivi d’une exposition aux UV et après cuisson à 120 oC pendant 2 min.- Cuire la plaquette enduite de photorésistants à 105 oC sur une plaque chauffante pendant 2 min. Cela sèche et durcit le film photorésistant, qui autrement colle au masque de verre et provoque des problèmes de contamination lors de l’exposition aux UV, et il améliore également l’adhérence de la photorésister à la surface de silice.
REMARQUE : La température de pré-cuisson ne doit pas être trop élevée, car cela peut causer la destruction partielle des composants sensibles à la lumière du photoresist, réduisant ainsi sa sensibilité.
- Cuire la plaquette enduite de photorésistants à 105 oC sur une plaque chauffante pendant 2 min. Cela sèche et durcit le film photorésistant, qui autrement colle au masque de verre et provoque des problèmes de contamination lors de l’exposition aux UV, et il améliore également l’adhérence de la photorésister à la surface de silice.
| Étape | Vitesse (rpm) | Rampe (rpm/s) | Temps (s) |
| 1 | 800 | 1000 | 3 |
| 2 | 1500 | 1500 | 3 |
| 3 | 3000 | 3000 | 30 |
Tableau 2 : Paramètres de la recette de revêtement de spin pour obtenir une couche de photorésistance de 1,6 m.
- Exposer la plaquette sous exposition UV (80 mJ/cm2) pendant 15 s à travers le masque chromé à l’aide d’un système d’alignement de masque (EVG 6200) pour obtenir la conception désirée sur le photoresist.
- Cuire la plaquette réalisée à 120 oC sur une plaque chauffante pendant 2 min. Au cours de cette étape, le film photoresist négatif exposé d’autres liens croisés. En conséquence, les parties exposées aux UV du photoresist ne sont plus solubles dans la solution de développeur, tandis que les zones non exposées sont solubles.
- Exposer davantage la plaquette sous la lumière UV (200 mJ/cm2) pendant 15 s dans un système de traitement UV (PRX-2000-20).
REMARQUE : Au cours de cette étape, les zones photorésistantes qui n’étaient pas exposées auparavant (étape 4.3) sont exposées et peuvent plus tard être dissoutes dans le développeur, laissant derrière elles les structures désirées sur la plaquette. Cette étape est tolérante à la surexposition parce que les caractéristiques désirées (dans le ton négatif) ne sont plus photosensibles après l’étape post-cuisson. - Immerger la plaquette dans un bain de 50 ml de l’AZ-726 photoresist-développeur (en verrerie) pour 60 s pour atteindre le modèle photoresist désiré sur la plaquette de silicium.
- Par la suite nettoyer la plaquette à l’aide d’eau DI et encore sécher avec N2.
5. Sputter
- Éclabrez le chrome sur la plaquette pendant 200 s pour obtenir une couche de chrome de 50 nm d’épaisseur. Le dépôt est effectué à l’aide d’un magnétron de type DC reputter réactif avec une source cible ronde standard de 2 po dans un environnement d’argon avec les paramètres suivants: 400 V, courant 1 A, et la pression de 5 mTorr.
REMARQUE : La couche de chrome protège la silice contre la gravure sèche sous octafluorocyclobutane (C4F8).
6. Décollage Photoresist
- Sonicate la gaufrette craché dans un bain d’acétone pendant 5 minutes pour décoller le photoresist restant (et le chrome déposé sur le photoresist) de la plaquette, laissant derrière lui les caractéristiques désirées avec un masque dur de chrome.
7. Traitement de l’autre côté de la plaquette
- Après avoir rincé l’arrière de la plaquette avec une quantité abondante d’acétone et d’éthanol, sécher à l’eau avec un canon N2, puis répéter les étapes 4.1 et 4.2.
8. Alignement manuel de dos
- Alignez les caractéristiques souhaitées à l’arrière avec le côté avant de la plaquette à l’aide des marques d’alignement dans la conception et du module « Alignement manuel avec réticule » dans l’aligneur de contact (EVG 6200).
REMARQUE : L’alignement manuel de dos est une étape cruciale dans le protocole de microfabrication. Ainsi, les caractéristiques d’alignement conçues sur le photomask doivent être utilisées efficacement pour éviter de compenser dans l’alignement des pores.
9. Lithographie à l’arrière de la plaquette
- Pour l’arrière de la plaquette, répétez les étapes 4.3-4.7, la section 5 et la section 6 pour générer la conception requise avec du chrome des deux côtés de la plaquette. Notez que la partie de la surface recouverte de chrome ne subit pas de gravure; ainsi, les taches dans lesquelles le chrome est absent sur la plaquette définissent les criques et les sorties du pore.
10. Gravure
- Undergo gravure de la couche SiO2 exposée des deux côtés de la plaquette par un plasma inductive couplé (ICP) réactif équicher (RIE) qui emploie le fluor (C4F8) et l’oxygène (O2) chimies. La durée est de 16 min (paramètres ICP-RIE énumérés dans le tableau 3) pour chaque côté.
- Traiter la plaquette avec cinq cycles de gravure anisotropique à l’aide du processus Bosch pour créer une encoche dans la couche de silicium. Ce processus est caractérisé par un profil plat de parois latérale utilisant des dépôts alternatifs de Gaz C4F8 et d’hexafluorure de soufre (SF6). En alternant gravure anisotrope et dépôt de polymère, les gravures de silicium vers le bas (paramètres d’étrage énumérés dans le tableau 3).
- Immerger la plaquette dans un bain de solution de piranha (H2SO4:H2O2 - 3:1 en volume) maintenu à une température de 388 K pendant 10 min. Cela élimine les polymères déposés dans l’étape anisotropique.
- Pour créer le sous-cut, qui donne le profil de réentrant, subir un etch isotropique à l’aide d’une recette sF6pour une durée de 165 s (paramètres de gravure énumérés dans le tableau 3).
REMARQUE : Cette étape est effectuée de chaque côté de la plaquette. - Gravure au silicium anisotropique
- Transférer la plaquette à l’ICP-RIE profond (instruments Oxford) pour émousser 150 m de silicium à l’aide de 200 cycles de gravure profonde à l’aide du procédé Bosch (les paramètres d’gravure sont énumérés dans le tableau 3).
- Répétez l’étape 10.4.1 avec l’arrière de la plaquette.
- Faites le nettoyage piranha de la plaquette dans le banc humide pendant 10 min pour enlever les contaminants polymères déposés du processus de gravure, ce qui assure des taux de gravure uniformes.
- Répétez les étapes 10.4.1-10.4.3 pour réaliser à travers les pores (qui peuvent être visualisés à l’œil nu sous une source de lumière) dans la plaquette ayant des entrées et des prises de reentrant.
- Immerger la plaquette dans un bain de 100 ml d’étchanter chromé pendant 60 s pour enlever le chrome des deux côtés de la plaquette.
| Paramètre | Gravure de silice | Gravure au silicium anisotropique /cycle | Gravure au silicium isotropique | |
| Dépôt | Gravure | |||
| Puissance RF (W) | 100 | 5 | 30 | 20 |
| Puissance ICP (W) | 1500 | 1300 | 1300 | 1800 |
| Pression d’étanchéité (mTorr) | 10 | 30 | 30 | 35 |
| Température (C) | 10 | 15 | 15 | 15 |
| C4F8 flux (sccm) | 40 | 100 | 5 | - |
| O2 flux (sccm) | 5 | - | - | - |
| Flux SF6 (sccm) | - | 5 | 100 | 110 |
| Temps de gravure (s) | 960 | 5 | 7 | 165 |
Tableau 3 : Paramètres pour la gravure sèche SiO2/Si.
11. Nettoyage final
- Après le processus de microfabrication, nettoyer la plaquette avec 100 ml de solution piranha fraîchement préparée (H2SO4:H2O2 ' 3:1 par volume; T 388 K) dans un récipient en verre pendant 10 min, puis encore sécher à l’eau avec un pistolet à pression N2 pur de 99 %.
- Placer les échantillons dans un plat Petri en verre à l’intérieur d’un four à vide propre à T 323 K jusqu’à ce que l’angle de contact intrinsèque de l’eau sur le SiO2 lisse soit stabilisé à 40 degrés (après 48 h).
- Conserver les échantillons secs obtenus (silica GEM) dans une armoire N2.
REMARQUE : L’ensemble du flux de travail de fabrication est représenté dans la figure 4.

Figure 4 : Illustration schématique du processus de microfabrication GEM. Veuillez cliquer ici pour voir une version plus grande de ce chiffre.
Résultats
Cette section présente les performances sous-marines de silice-GEMs microfabriqués en utilisant le protocole mentionné ci-dessus. Les pores de ces GEM étaient alignés verticalement, les diamètres de l’entrée/sortie étaient D à 100 m, la distance centre-centre entre les pores (pitch) était de 400 m, la séparation entre les bords du reentrant et le mur était de 18 m, et la longueur des pores était de 300 m (figure 5). En raison des inhomogénéités encourues pendant les étapes de gravure et du désalignement mineur pendant la microfabrication, la partie moyenne des pores était un peu plus étroite comparée à la partie au-dessous des entrées et des sorties des pores, cependant, elle n’a pas affecté le flux de masse de manière significative.
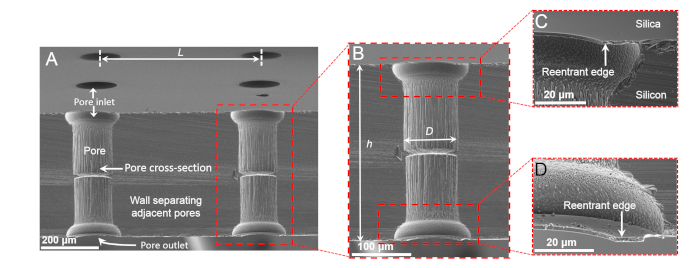
Figure 5 : Micrographies électroniques de balayage de silice-GEMs. Sont montrées (A) une vue transversale inclinée des silice-GEMs, (B) une vue transversale agrandie d’un seul pore, et (C,D) agrandit les vues des bords de la rentrée aux entrées et aux sorties d’un pore. Les panneaux (C) et (D) sont réimprimés à partir de Das et coll.37. Veuillez cliquer ici pour voir une version plus grande de ce chiffre.
Plongée de silice-GEMs dans l’eau
La silice (SiO2) est hydrophile, caractérisée par l’angle de contact intrinsèque des gouttes d’eau sous la vapeur d’eau saturée, oo 40 degrés. Ainsi, si les pores cylindriques sont créés sur une feuille de silice, l’eau les imbiberait, atteignant le plein rempli, ou l’état de Wenzel32. Pour tester cela, un module sur mesure a été utilisé qui peut sécuriser un test-membrane entre un réservoir d’eau salée teint (0,6 M NaCl avec colorant alimentaire) et de l’eau déionisée(T 293 K et p - 1 atm). Il enregistre également la conductivité électrique du réservoir d’eau déionisé dans un ordinateur pour surveiller le remplissage des pores in situ (Figure 6A). Ici, les membranes de silice avec des trous cylindriques simples n’ont pas été en mesure d’empêcher le mélange des deux réservoirs, puisque l’eau s’est infiltrée instantanément comme le reflète la libération du colorant (Film supplémentaire). En revanche, lorsque les silice-GEM ont été testés dans les mêmes conditions, ils ont solidement emprisonné l’air et l’ont maintenu intact pendant plus de 6 semaines, confirmé par des mesures de conductivité électrique (limite de détection de 0,01 S/cm), après quoi l’expérience a été interrompue (figure 6B). Ces résultats établissent que l’architecture geMs peut permettre aux matériaux hydrophiles de piéger solidement l’air lors de l’immersion dans l’eau. En outre, un scénario de niveau de pores a été présenté dans lequel la faible solubilité de l’air emprisonné dans l’eau et la courbure de l’interface air-eau ont empêché le ménisque liquide de s’immiscer plus loin dans le pore (figure 6C).

Figure 6 : Essais de robustesse des membranes. (A) Schéma tique de la cellule personnalisée imprimée en 3D pour tester la robustesse des membranes lors de la séparation de l’eau salée teintée (0,6 M NaCl avec colorant alimentaire) de l’eau pure déionisée(T 293 K, p - 1 atm), tout en enregistrant simultanément la conductivité électrique du réservoir d’eau DI dans un ordinateur. (B) Une parcelle semi-logarithmique de la conductivité électrique du réservoir d’eau DI s’agrandit lorsque des silice-GEM ont été utilisés pour séparer les deux réservoirs. Remarquablement, la silice-GEMs solidement emprisonné l’air dans chaque pore, de sorte que l’eau ne pouvait pas pénétrer même un seul porre pendant plus de 6 semaines, comme en témoignent les données de conductivité électrique. (C) Schéma de niveau pore, montrant l’interface air-eau à chaque extrémité. Les panneaux (A) et (B) sont réimprimés à partir de Das et coll.37. Veuillez cliquer ici pour voir une version plus grande de ce chiffre.
Afin d’avoir une meilleure compréhension de l’épinglage et des déplacements de l’interface air-eau dans les criques et les sorties de silice-GEM sous l’eau (colonne de 5 mm), une microscopie confocale a été utilisée. Il est bien connu que le laser utilisé pour l’éclairage dans la microscopie confocale chauffe également le système39, ce qui peut accélérer les transitions de mouillage. Néanmoins, la haute résolution spatiale peut donner un aperçu utile. À titre de comparaison, le comportement des surfaces de silice avec des cavités de réentrant a également été étudié29,40. Dans les deux scénarios, la chaleur supplémentaire fournie au réservoir d’eau ci-dessus améliore la condensation capillaire de vapeur d’eau à l’intérieur de la microtexture. Dans le cas des cavités de réentrer, la condensation de vapeur d’eau a déplacé l’air emprisonné, ce qui a provoqué un gonflement de l’interface air-eau vers le haut et a déstabilisé le système (figure 7A,C). Dans ces conditions expérimentales, l’eau s’est intillée dans toutes les cavités en moins de 2 h. En revanche, les silice-GEM sont restés exempts de renflement pendant une période beaucoup plus longue, même si le taux de chauffage était similaire. Ces résultats ont été rationalisés sur la base de la condensation préférentielle de la vapeur d’eau du réservoir chauffé au laser sur l’interface air-eau plus froide de l’autre côté du pore (figure 7B,D). Cependant, il n’a pas été possible de mesurer le taux de transfert de masse dans cette configuration expérimentale.

Figure 7 : Interfaces air-eau. (A) Reconstructions 3D améliorées par ordinateur de l’interface air-eau à des entrées de silice-GEMsous (hauteur de colonne, z - 5 mm ; puissance laser - 0,6 mW) avec des vues transversales le long des lignes pointillées blanches (sur les côtés gauche et droit de l’image centrale). En raison du chauffage du laser sur le côté supérieur, la vapeur d’eau condensée à l’intérieur des cavités, déplaçant l’air emprisonné. Cela a fait gonfler le ménisque air-eau vers le haut et devenir instable. Après 1,5 h, la plupart des cavités ont été envahies par l’eau. (B) Micrographies confocales de silice-GEM dans des conditions similaires à celles (A). (C) Schéma tique du renflement du ménisque air-eau dans le cas des cavités de rentrée sous l’eau. (D) Schématique pour un pore en silice-GEMs dans des conditions similaires. La vapeur d’eau chaude se condense partout, notamment sur l’interface air-eau plus froide sur le côté plus loin du laser. À la suite de ce transfert de masse, il ya une accumulation de pression minimale dans le pores. Veuillez cliquer ici pour voir une version plus grande de ce chiffre.
Distillation de membrane de contact direct avec GEMs
Ayant établi que les silice-GEM peuvent séparer solidement deux réservoirs d’eau de chaque côté, une configuration statique de DCMD a été testée, dans laquelle le côté d’alimentation salée (0,6 M NaCl à T - 333 K) et le côté périmé désionisé(T - 288 K) étaient des réservoirs statiques. Même si les silice-GEM empêchaient l’intrusion d’eau, des flux mesurables n’ont pas été observés. Cela est dû au fait que la conductivité thermique du silicium (k - 149 W-m-1 K-1)41 est des ordres de grandeur plus élevés que celui des membranes Typiques de DCMD (c.-à-d., k lt; 1 W-m-1-K-1)2. Ainsi, la configuration expérimentale avec la silice-GEMs a souffert de ce qu’on appelle la polarisation de température, dans laquelle le côté chaud perd la chaleur au côté froid, abaissant le flux31.
Il peut être possible de réduire la conductivité thermique du silicium par nanostructude42 (par exemple, pour améliorer ses propriétés thermoélectriques43), mais ces avenues n’ont pas été explorées. Au lieu de cela, les principes de conception de silica-GEMs ont été traduits en feuilles de polyméthylmethacrylate (PMMA)(o' 70 ' pour l’eau, k -0,19 W-m-1-K-1)40 pour créer PMMA-GEMs37. En effet, le premier lot (preuve de concept) de PMMA-GEM avec une faible porosité (de 0,08) a montré une séparation robuste du côté des aliments et de l’imprégnation et a donné un flux de 1 L-m2-h-1 sur 90 h. Ainsi, il est possible de traduire ces études basées sur la silice-GEM à l’aide de matériaux plus communs pour la génération de membranes plus vertes et à moindre coût pour le dessalement.
Film supplémentaire. S’il vous plaît cliquez ici pour voir ce fichier (Clic droit pour télécharger).
Discussion
Ce travail présente la conception et la fabrication de silice-GEMs, les premières membranes DCMD dérivées de matériaux hydrophiles. La microfabrication avec le système SiO2/Si offre une immense flexibilité pour créer des microtextures pour tester des idées créatives. Bien sûr, la portée de ce travail se limite à la preuve de concept pour les GEM, parce que les gaufrettes SiO2/Si/SiO2 et les protocoles de microfabrication de la salle blanche ne sont pas pratiques pour les membranes de dessalement.
Il convient de noter que, même si l’architecture GEMs peut empêcher l’intrusion de l’eau lors de l’immersion lorsque l’angle de contact intrinsèque est de 40 degrés, cette stratégie échoue si la surface est rendue superhydrophile. Par exemple, après l’exposition au plasma d’oxygène, les surfaces de silice présentent un taux de 5 euros, et ces silice-GEM perdent de l’air qui est emprisonné à l’intérieur des pores spontanément sous forme de bulles, parce que le ménisque liquide n’est plus épinglé sur les bords de la rentrée. Cependant, les plastiques courants, tels que l’alcool en polyvinyle(o o 51 degrés) et le poly (éthylène téphtalate)(o o - 72 degrés), devraient être adaptés à cette approche. Ainsi, les principes de conception appris de silica-GEMs peuvent être mis à l’échelle en utilisant l’impression 3D44, la fabrication additive45, micromachining laser46, et CNC fraisage37, etc.
Ensuite, certains aspects cruciaux de la microfabrication de silice-GEM s’ensuivent, qui nécessitent une attention particulière. L’alignement manuel du dos (section 8) des caractéristiques doit être effectué avec autant de soin que possible pour atteindre les pores alignés verticalement. Les décalages peuvent entraîner des pore-throats, et dans le pire des cas, le désalignement peut conduire à seulement des cavités de chaque côté (pas de pores). Ainsi, il est suggéré d’utiliser des marques d’alignement à plusieurs échelles, la plus petite marque d’alignement étant au moins quatre fois plus petite que le diamètre des pores.
Pendant la gravure de la couche de silice avec C4F8 et O2 (étape 10.1), l’utilisation préalable (c.-à-d., la propreté) de la chambre de réaction peut influencer les taux de gravure. C’est en raison de la présence de contaminants dans la chambre de réaction, une occurrence commune dans les installations partagées d’utilisateur telles que des universités. Ainsi, il est recommandé que cette étape est effectuée d’abord sur une plaquette factice pour s’assurer que le système est propre et stable. En outre, il est conseillé d’utiliser de courtes périodes pour la gravure (par exemple, pas plus de 5 minutes tout en surveillant l’épaisseur de la couche de silice à l’aide de réflectométrie). Par exemple, s’il faut 16 min pour enlever complètement une couche De 2 M SiO2 d’une plaquette SiO2/Si/SiO2, le processus de gravure doit être divisé en quatre étapes comprenant trois cycles de 5 min suivis d’une réflexion, et une étape de gravure de 1 min (facultatif), basée sur les résultats de la réfététométrie.
Pour préserver les caractéristiques de reentrant de silice pendant le processus de Bosch qui est employé pour équerler la couche de silicium (étape 10.4), il est crucial qu’un masque dur de chrome soit employé. Le processus Bosch implique le dépôt de C4F8 pour assurer le profil anisotropique. Cependant, sur de longs cycles de gravure, cette couche peut devenir très épaisse et difficile à enlever. Ainsi, il est recommandé que le processus Bosch ne devrait pas être exécuté pendant plus de 200 cycles, et il devrait être suivi par le nettoyage piranha. Il a également été observé que de longs cycles de gravure profonde réduisent également l’épaisseur de la couche de silice, malgré la présence d’un masque dur de chrome.
La plupart des outils de gravure à sec n’atteignent pas l’uniformité spatiale en termes de taux de gravure. Ainsi, les caractéristiques obtenues au centre d’une plaquette SiO2/Si/SiO2 peuvent ne pas être les mêmes que celles à la limite de la plaquette. Ici, des caractéristiques de haute qualité ont été réalisées dans le centre de 4 "wafers, et des échantillons ont été périodiquement observés sous un microscope. Dans le cas où certaines régions sont gravées plus que d’autres, la plaquette doit être divisée en morceaux qui doivent être gravés séparément.
Ce protocole de fabrication peut être appliqué aux gaufrettes SiO2/Si/SiO2 de toute épaisseur; cependant, une couche plus épaisse signifie qu’un plus grand nombre de cycles de gravure est nécessaire. Il est suggéré d’utiliser des plaquettes de silicium d’une épaisseur de 300 m, tant que cela ne compromet pas l’intégrité mécanique de la plaquette lors de la manipulation et de la caractérisation.
Déclarations de divulgation
R.D., S.A. et H.M. ont déposé un brevet international, Application No. PCT/IB2019/054548.
Remerciements
H.M. reconnaît le financement de l’Université des sciences et de la technologie du roi Abdallah dans le cadre de l’accès au laboratoire de base de la nanofabrication, le 1/1070-01-01 et le KAUST.
matériels
| Name | Company | Catalog Number | Comments |
| 3D Printer | BCN3D | 020.180510.3103 | BCN3D Sigma 3D printer for printing test module with PLA (polylactic acid) filament. |
| Acetone | BASF | ||
| AZ-5214 E photoresist | Merck | ||
| AZ-726 MIF developer | Merck | ||
| Chrome Etchant | MicroChemicals | TechniEtch Cr01 | To remove chromium from silicon wafer and mask |
| Conductivity Meter | Hanna | HI98192 | To measure conductivity of pure water during leak testing. |
| Confocal microscope | Zeiss | ZEISS LSM 710 | For fluorescence imaging of water. |
| Contact Aligner | EVG | EVG6200 | Mask aligner |
| Deep ICP-RIE | Oxford Instruments | Plasmalab system100 | |
| DI water | |||
| Direct writer | Heidelberg Instruments | µPG501 direct-writing system | UV exposure |
| Food Dye | Kroger | Green food dye to label salty water. | |
| Glass Petri dish | VWR | ||
| HMDS vapor prime | Yield Engineering systems | ||
| Hot plate | Cost effective equipments | Model 1300 | |
| Hydrogen peroxide 30% | VWR chemicals | To prepare piranha solution. | |
| Imaris software | Bitplane | Version 8 | Postprocess confocal microscopy images |
| Nitrogen gas | |||
| Optical surface profiler | Zygo | Zygo newview 7300 | |
| Photomask | Nanofilm | 5-inch soda lime glass mask | |
| Profilometer | Veeco | Detak 8 | Stylus profilometer |
| Reactive Sputter | Equipment Support Company Ltd | Chromium sputtering | |
| Reactive-Ion Etching (RIE) | Oxford Instruments | Plasmalab system100 | |
| Reflectometer | Nanometrics | Nanospec 6100 | To check remaining oxide layer thickness. |
| Rhodamine B | Merck | 81-88-9 | Dye for imaging water meniscus under confocal microscope. |
| SEM stub | Electron Microscopy Sciences | ||
| SEM-Quanta 3D | FEI | Quanta 3D FEG Dual Beam (SEM/FIB) | |
| Silicon wafer | Silicon Valley Microelectronics | Double side polished, 4" diamater, 300 µm thickness, 2 µm thick oxide layer, p-doped, <100> orientation. | |
| Sodium Chloride | Merck | 7647-14-5 | For preparing NaCl solution |
| Sonicator | Branson | 1510 | |
| Spin coater | Headway Research,Inc. | ||
| Spin dryer | MicroProcess | Avenger Ultra Pure 6 | Spin drying in Nitrogen environment. |
| Sputter | Quorum Technologies | Q150T S | Iridium sputter for SEM. |
| Sulfuric acid 96% | Technic | 764-93-9 | To prepare piranha solution. |
| Tanner EDA L-Edit software | Tanner EDA, Inc. | For designing photomask | |
| Tweezers | Excelta | ||
| UV Cure | Tamarack Scientific Co. Inc. | PRX-2000-20 | For flood exposure of wafer and photomask |
| Vaccum oven | Thermo Scientific | 13-258-13 | Lindberg/Blue M |
| Wet bench | JST Manufacturing Inc. | 17391-015-00 | Wet bench used for piranha cleaning |
Références
- Fisher, J. B., et al. The future of evapotranspiration: Global requirements for ecosystem functioning, carbon and climate feedbacks, agricultural management, and water resources. Water Resources Research. 53 (4), 2618-2626 (2017).
- Deshmukh, A., et al. Membrane distillation at the water-energy nexus: limits, opportunities, and challenges. Energy & Environmental Science. 11 (5), 1177-1196 (2018).
- Ali, A., Tufa, R. A., Macedonio, F., Curcio, E., Drioli, E. Membrane technology in renewable-energy-driven desalination. Renewable and Sustainable Energy Reviews. 81, 1-21 (2018).
- Ghaffour, N., et al. Renewable energy-driven innovative energy-efficient desalination technologies. Applied Energy. 136, 1155-1165 (2014).
- Chen, J., et al. Recovery of dilute aqueous butanol by membrane vapor extraction with dodecane or mesitylene. Journal of Membrane Science. 528, 103-111 (2017).
- Wang, P., Chung, T. -. S. Recent advances in membrane distillation processes: Membrane development, configuration design and application exploring. Journal of Membrane Science. 474, 39-56 (2015).
- Khayet, M. Membranes and theoretical modeling of membrane distillation: A review. Advances in Colloid and Interface Science. 164 (1-2), 56-88 (2011).
- Drioli, E., Ali, A., Macedonio, F. Membrane distillation: Recent developments and perspectives. Desalination. 356, 56-84 (2015).
- Souhaimi, M. K., Matsuura, T. . Membrane Distillation. 1st edn. , (2011).
- Janssen, D., De Palma, R., Verlaak, S., Heremans, P., Dehaen, W. Static solvent contact angle measurements, surface free energy and wettability determination of various self-assembled monolayers on silicon dioxide. Thin Solid Films. 515 (4), 1433-1438 (2006).
- Hendren, Z. D., Brant, J., Wiesner, M. R. Surface modification of nanostructured ceramic membranes for direct contact membrane distillation. Journal of Membrane Science. 331 (1-2), 1-10 (2009).
- Verho, T., et al. Mechanically Durable Superhydrophobic Surfaces. Advanced Materials. 23, 673-678 (2011).
- Boinovich, L., Emelyanenko, A. M., Pashinin, A. S. Analysis of Long-Term Durability of Superhydrophobic Properties under Continuous Contact with Water. ACS Applied Materials & Interfaces. 2 (6), 1754-1758 (2010).
- Lindstrom, A. B., Strynar, M. J., Libelo, E. L. Polyfluorinated compounds: past, present, and future. Environmental Science & Technology. 45 (19), 7954-7961 (2011).
- Gryta, M. Influence of polypropylene membrane surface porosity on the performance of membrane distillation process. Journal of Membrane Science. 287 (1), 67-78 (2007).
- An, A. K., et al. Enhanced vapor transport in membrane distillation via functionalized carbon nanotubes anchored into electrospun nanofibres. Scientific Reports. 7, (2017).
- Hammami, M. A., et al. Engineering Hydrophobic Organosilica Nanoparticle-Doped Nanofibers for Enhanced and Fouling Resistant Membrane Distillation. ACS Applied Materials & Interfaces. 9 (2), 1737-1745 (2017).
- Shi, Y., et al. A 3D Photothermal Structure toward Improved Energy Efficiency in Solar Steam Generation. Joule. 2 (6), 1171-1186 (2018).
- Wang, W., et al. Simultaneous production of fresh water and electricity via multistage solar photovoltaic membrane distillation. Nature Communications. 10 (1), 3012 (2019).
- Hensel, R., Neinhuis, C., Werner, C. The springtail cuticle as a blueprint for omniphobic surfaces. Chemical Society Reviews. 45 (2), 323-341 (2016).
- Helbig, R., Nickerl, J., Neinhuis, C., Werner, C. Smart Skin Patterns Protect Springtails. PLoS ONE. 6 (9), 25105 (2011).
- Andersen, N. M., Cheng, L. The marine insect Halobates (Heteroptera: Gerridae): biology, adaptations, distribution, and phylogeny. Oceanography and Marine biology: an Annual Review. 42, 119-180 (2004).
- Cheng, L. Marine and Freshwater Skaters: Differences in Surface Fine Structures. Nature. 242, 132 (1973).
- Gao, X., Jiang, L. Water-repellent legs of water striders. Nature. 432 (7013), 36 (2004).
- Golovin, K. B., Gose, J., Perlin, M., Ceccio, S. L., Tuteja, A. Bioinspired surfaces for turbulent drag reduction. Philosophical Transactions of the Royal Society A - Mathematical Physical and Engineering Sciences. 374 (2073), (2016).
- Liu, T. Y., Kim, C. J. Turning a surface superrepellent even to completely wetting liquids. Science. 346 (6213), 1096-1100 (2014).
- Domingues, E. M., Arunachalam, S., Mishra, H. Doubly Reentrant Cavities Prevent Catastrophic Wetting Transitions on Intrinsically Wetting Surfaces. ACS Applied Materials & Interfaces. 9 (25), 21532-21538 (2017).
- Arunachalam, S., Das, R., Nauruzbayeva, J., Domingues, E. M., Mishra, H. Assessing omniphobicity by immersion. Journal of Colloid and Interface Science. 534, 156-162 (2019).
- Domingues, E. M., Arunachalam, S., Nauruzbayeva, J., Mishra, H. Biomimetic coating-free surfaces for long-term entrapment of air under wetting liquids. Nature Communications. 9 (1), 3606 (2018).
- Gonzalez-Avila, S. R., Nguyen, D. M., Arunachalam, S., Domingues, E. M., Mishra, H., Ohl, C. D. Mitigating cavitation erosion using biomimetic gas-entrapping microtextured surfaces. Science Advances. , (2020).
- Subramanian, N., et al. Evaluating the potential of superhydrophobic nanoporous alumina membranes for direct contact membrane distillation. Journal of Colloid and Interface Science. 533, 723-732 (2019).
- Wenzel, R. N. Resistance of solid surface to wetting by water. Industrial and Engineering Chemistry. 28 (8), 7 (1936).
- Cassie, A. B. D., Baxter, S. Wettability of porous surfaces. Transactions of the Faraday Society. 40, 0546-0550 (1944).
- Kaufman, Y., et al. Simple-to-Apply Wetting Model to Predict Thermodynamically Stable and Metastable Contact Angles on Textured/Rough/Patterned Surfaces. The Journal of Physical Chemistry C. 121 (10), 5642-5656 (2017).
- Mishra, H., et al. Time-Dependent Wetting Behavior of PDMS Surfaces with Bioinspired, Hierarchical Structures. ACS Applied Materials & Interfaces. 8 (12), 8168-8174 (2016).
- Seo, D., et al. Rates of cavity filling by liquids. Proceedings of the National Academy of Sciences. , (2018).
- Das, R., Arunachalam, S., Ahmad, Z., Manalastas, E., Mishra, H. Bio-inspired gas-entrapping membranes (GEMs) derived from common water-wet materials for green desalination. Journal of Membrane Science. 588, 117185 (2019).
- Tanner Research. . Manual, L.-E.U. , (1996).
- Xu, M. C., Sun, G. U., Kim, C. J. Infinite Lifetime of Underwater Superhydrophobic States. Physical Review Letters. 113 (13), (2014).
- Arunachalam, S., Domingues, E. M., Das, R., Nauruzbayeva, J., Buttner, U., Syed, A., Mishra, H. Rendering SiO2/Si Surfaces Omniphobic by Carving Gas-Entrapping Microtextures Comprising Reentrant and Doubly Reentrant Cavities or Pillars. Journal of Visualized Experiments. , e60403 (2020).
- Dean, J. A. . Lange's Handbook of Chemistry. , (1999).
- Yu, J. K., Mitrovic, S., Tham, D., Varghese, J., Heath, J. R. Reduction of thermal conductivity in phononic nanomesh structures. Nature Nanotechnology. 5 (10), 718-721 (2010).
- Mishra, H., et al. Thermomechanical and Thermal Contact Characteristics of Bismuth Telluride Films Electrodeposited on Carbon Nanotube Arrays. Advanced Materials. 21 (42), 4280 (2009).
- Liu, X., et al. 3D Printing of Bioinspired Liquid Superrepellent Structures. Advanced Materials. , 1800103 (2018).
- Jafari, R., Cloutier, C., Allahdini, A., Momen, G. Recent progress and challenges with 3D printing of patterned hydrophobic and superhydrophobic surfaces. The International Journal of Advanced Manufacturing Technology. , 1-14 (2019).
- Vorobyev, A., Guo, C. Multifunctional surfaces produced by femtosecond laser pulses. Journal of Applied Physics. 117 (3), 033103 (2015).
Réimpressions et Autorisations
Demande d’autorisation pour utiliser le texte ou les figures de cet article JoVE
Demande d’autorisationThis article has been published
Video Coming Soon