Un abonnement à JoVE est nécessaire pour voir ce contenu. Connectez-vous ou commencez votre essai gratuit.
Method Article
Caractérisation des modifications de surface par interférométrie en lumière blanche: Applications de pulvérisation ionique, ablation laser, tribologie et expériences
Dans cet article
Résumé
Blanc interférométrie microscope optique est une méthode optique, sans contact et rapide de mesure de la topographie de surface. Il est montré comment la méthode peut être appliqué à l'analyse usure mécanique, où l'usure des cicatrices sur échantillons tribologiques sont analysés, et en science des matériaux pour déterminer pulvérisation par faisceau d'ions ou des volumes d'ablation laser et profondeurs.
Résumé
En science et génie des matériaux, il est souvent nécessaire d'obtenir des mesures quantitatives de la topographie de surface avec une résolution micrométrique latéral. De la surface mesurée, des cartes topographiques en 3D peuvent ensuite être analysées en utilisant une variété de logiciels pour extraire les informations dont on a besoin.
Dans cet article, nous décrivons comment l'interférométrie en lumière blanche, et la profilométrie optique (OP) en général, associée à un logiciel d'analyse de surface générique, peut être utilisée pour la science des matériaux et les tâches d'ingénierie. Dans cet article, un certain nombre d'applications de l'interférométrie en lumière blanche pour enquêter sur les modifications de surface en spectrométrie de masse et phénomènes d'usure et de la lubrification en tribologie sont démontrés. On caractérise les produits de l'interaction des semi-conducteurs et les métaux avec des ions énergétiques (pulvérisation cathodique), et l'irradiation laser (ablation), ainsi que les anciens mesures in situ de l'usure des éprouvettes tribologiques. Plus précisément, nous allons discuter:
- Les aspects de la spectrométrie de masse traditionnelle pulvérisation ionique à base tels que les taux de pulvérisation / mesures rendements sur Si et Cu et après le temps-profondeur de conversion.
- Résultats de caractérisation quantitative de l'interaction du rayonnement laser femtoseconde avec une surface semi-conductrice. Ces résultats sont importants pour des applications telles que la spectrométrie de masse ablation, où les quantités de matière évaporée peut être étudié et contrôlé par durée d'impulsion et de l'énergie par impulsion. Ainsi, en déterminant la géométrie du cratère, on peut définir la résolution en profondeur et latéralement par rapport aux conditions expérimentales de configuration.
- Mesures des paramètres de rugosité de surface en deux dimensions, et des mesures quantitatives de l'usure de la surface qui se produisent à la suite de tests de frottement et d'usure.
Certains inconvénients inhérents, des artefacts possibles, et les évaluations des incertitudes de la lumière blancheapproche interférométrie seront discutés et expliqués.
Introduction
La surface des matériaux solides détermine les propriétés d'un dans une large mesure de l'intérêt pour ces matériaux: électronique, structurellement et chimiquement. Dans de nombreux domaines de la recherche, l'ajout de matière (par exemple, dépôt de couches minces par impulsions laser / pulvérisation magnétron de dépôt, physique / chimique en phase vapeur), un enlèvement de matière (gravure ionique réactive, la pulvérisation d'ions, ablation au laser, etc), ou d'autres processus, doivent être caractérisés. En outre, la modification de surface par l'interaction avec des impulsions de lumière ou de particules chargées énergétiques a de nombreuses applications et est d'un intérêt fondamental. Tribologie, l'étude du frottement et à l'usure, est un autre domaine d'intérêt. Sur une échelle de paillasse, une multitude de géométries tests tribologiques exister. Géométries de contact non conforme peuvent être utilisés, et une bille ou d'un cylindre peut être glissée ou tournée contre une surface plane, l'autre bille ou cylindre, sur une longueur de temps, et la quantité de matière qui est enlevée est measured. Parce que la cicatrice d'usure est en trois dimensions et irrégulière dans la nature, profilométrie optique peut être la seule technique appropriée pour obtenir des mesures précises de volumes d'usure. Tâches d'analyse communs incluent également des paramètres de rugosité de surface, hauteur étape, la perte de volume du matériau, la profondeur des tranchées, et ainsi de suite; chacun d'entre eux peut être obtenu en plus de la visualisation topographie simple 2D et 3D.
Profilométrie optique se rapporte à un procédé optique qui est utilisé pour reconstruire le profil de surface. Profilométriques méthodes comprennent interférométrique lumière blanche, laser, ou des méthodes confocale. Certains profilomètres optiques d'obtenir des informations à travers des approches classiques basées sur des objectifs de microscope à diffraction limitée. Par exemple, un laser à balayage peut être intégré avec un microscope afin d'obtenir des informations de couleur topographique et véritable de surfaces. Une deuxième méthode utilise une technique qui exploite la profondeur extrêmement faible de mise au point des objectifs conventionnels pour assembler un series de de mise au point "tranches" d'image de la surface pour obtenir une carte topographique en 3D.
Dans ce travail, nous montrons comment une lumière blanche microscope interférométrique / profilomètre permet la mesure de la quantité de matière perdue au cours des processus d'usure mécanique, ou au cours de procédés de gravure de matériaux tels que les cratères de pulvérisation d'ions ou d'ablation au laser. La plus grande attention est accordée à la méthodologie de cette méthode pour illustrer sa grande capacité installée qui le rend largement accessible et attrayant pour de nombreuses applications. La plupart des types de WLI employer la technique de Mirau, qui utilise un miroir intérieur de l'objectif de microscope à des interférences entre un signal lumineux de référence et la lumière réfléchie par la surface de l'échantillon. Le choix de Mirau interférométrie est dictée par simple commodité, car l'interféromètre toute Mirau peut être monté à l'intérieur de l'objectif de microscope et couplé à un microscope optique ordinaire (figure 1). Une série de deux inter-dimensionnelleferograms sont acquises avec une caméra vidéo et un logiciel assemble une carte topographique en 3D. La source de lumière blanche fournit un éclairage à large spectre qui aide à surmonter l '«ordre frange" ambiguïté inhérente à une source monochromatique. Une source de lumière monochromatique peut être utilisé pour obtenir une mesure plus précise de caractéristiques topographiques peu profondes. La résolution latérale est fondamentalement limitée à λ / 2 (ouverture numérique, NA = 1), mais dans la plupart des cas est plus grande, étant déterminée par le NA de l'objectif, qui est à son tour relié à un grossissement / champ de vue taille. Tableau 1 dans Réf. 1 a une comparaison directe de tous les paramètres mentionnés. Approches résolution en profondeur ≈ 1 nm, étant fonction de la nature de la technique interférométrique. Plus d'informations sur Mirau WLI peuvent être trouvés dans les références. 2, 3. Une introduction sur blanc approche interférométrique lumière peut être trouvée dans la référence. 4.
D'autres méthodes d'analyse de surfaces sont atomiques forcmicroscopie électronique (AFM), microscopie électronique à balayage (MEB), et la profilométrie stylet. La technique WLI se compare favorablement à ces méthodes et a ses propres avantages et inconvénients qui sont dues à la nature de la méthode optique.
L'AFM est capable d'obtenir des images 3D et donc des sections transversales correspondantes, mais AFM a une capacité limitée de balayage dans le sens latéral (<100 pm) et la profondeur (<10 um) axes. Contrairement à ceux-ci, le principal avantage de WLI est la souplesse champ de vision (FOV) pouvant aller jusqu'à quelques millimètres simultanée capacité d'imagerie 3D réel. En outre, comme nous allons le démontrer qu'elle a une grande capacité de plage de balayage vertical, permettant de résoudre une variété de problèmes de modification de surface simplement. Les chercheurs qui ont travaillé avec l'AFM sont conscients du problème avec le positionnement en plan d'un échantillon lors de la mesure des caractéristiques prolongées de faibles gradients verticaux. En règle générale, on peut penser WLI / OP comme un «express» technique par rapport à l'AFM. Bien sûr, il ya desun certain nombre de domaines pour lesquels seule l'AFM est approprié: lorsque les caractéristiques latéraux à résoudre ont des dimensions caractéristiques plus petites que la résolution latérale de WLI, ou dans les cas où les données de WLI est ambiguë en raison de inconnus ou complexes propriétés optiques d'un échantillon d'une manière qui affecte la précision des mesures (à voir plus loin), etc
Le SEM est un moyen puissant pour regarder surfaces, en étant très flexible en termes de taille de champ de vision avec une grande profondeur de mise au point, plus grand que n'importe quel microscope optique classique peut offrir. Dans le même temps, l'imagerie 3D par MEB est lourd, particulièrement en ce qui nécessite de prendre des paires stéréo-images qui sont ensuite converties en images en 3D par la méthode anaglyphe, ou par l'observation des visionneuses optiques, ou utilisés pour le calcul direct des profondeurs entre les différents points d'intérêt sur un échantillon. 5 En revanche, WLI / OP profilométrie propose des services faciles à utiliser simultanément la reconstruction 3D avec souplesse FOV. WLI balaie la totalitéportée en hauteur nécessaire pour l'échantillon particulier (à partir de nanomètres à plusieurs centaines de microns). WLI n'est pas affectée par la conductivité électrique du matériau d'échantillon, qui peut être un problème avec SEM. WLI n'est manifestement pas un vide. D'un autre côté, il ya un certain nombre d'applications pour lesquelles SEM fournit des informations de qualité supérieure: caractéristiques latéraux à résoudre des dimensions caractéristiques ci-dessous la résolution latérale WLI, ou les cas où différentes parties d'un échantillon peut être topographiquement se distinguent uniquement lorsque les coefficients d'émission d'électrons secondaires diffèrent.
Une autre technique pour l'inspection de surface, ce qui est largement utilisé dans la spectrométrie de masse d'ions secondaires 6 et dans le domaine de la caractérisation des systèmes de micro-électromécanique 7 est stylet profilométrie. Cette technique est très populaire en raison de sa simplicité et de robustesse. Il est basé sur le balayage contact mécanique direct d'une pointe de stylet sur la surface de l'échantillon. Il s'agit d'un outil de contact grossier, Qui est capable de balayer le long d'une seule ligne à la fois. Il rend la surface 3D à balayage récurrent d'imagerie extrêmement chronophage. Un autre inconvénient de la technique du stylet est la difficulté de mesurer les caractéristiques de surface de rapport d'aspect élevé et d'une taille comparable à sa taille d'embout caractéristique (taille inférieure au micron à quelques microns généralement) qui implique un rayon de pointe et un angle de sommet de la pointe. Un avantage de stylet profilométrie est son insensibilité à la variation des propriétés optiques d'un échantillon, ce qui peut affecter la précision de WLI / OP mesures (nous parlerons plus loin).
Les cartes de surface dans le présent article ont été obtenus selon un procédé classique de type Mirau WLI (Figure 1). De nombreuses entreprises telles que Zygo, KLA-Tencor, les nanosciences, Zemetrics, Nanovea, FRT, Keyence, Bruker, et Taylor Hobson produire commerciales de table instruments OP. Les cartes acquises ont été reconstruits et traitées en utilisant un logiciel commercial d'un type qui est couramment utilisé pour WLI, électronique à balayage, or microscopie à sonde. Le logiciel a la capacité d'effectuer des manipulations mathématiques de la surface, traversez le profil de la section d'analyse, nulle et calculs de volumes importants, et la correction d'avion. Les autres logiciels peuvent automatiser certaines de ces caractéristiques.
Access restricted. Please log in or start a trial to view this content.
Protocole
1. Alignement du matériel pour General WLI balayage
Pour obtenir des informations quantitatives par le biais WLI, les étapes suivantes peuvent servir de guide. On suppose que l'opérateur possède une connaissance de base du fonctionnement de l'interféromètre. Les lignes directrices sont communes quel que soit l'instrument spécifique. Pour certaines enquêtes, l'échantillon sera plat. Pour d'autres, l'échantillon peut être courbé.
- Placer l'échantillon sur la scène avec la fonction (ions pulvérisés cratère, un faisceau ionique / spot ablation, ou porter des cicatrices) face vers le haut. Utilisez un objectif à faible grossissement et de se concentrer sur l'instrument lui. Pour une meilleure résolution obtenir une image où l'objet de l'intérêt remplit largement l'écran, voir Figure 2 pour un exemple d'une balle.
- Ajustez la position verticale de l'échantillon de façon que les franges d'interférence apparaissent près de la caractéristique d'intérêt. Pour une surface plane, il est souhaitable que le spécimen est orienté de telle sorte que le plan est perpendicular rapport à l'axe optique, c'est à dire l'écartement des franges est grande. Pour une surface courbe (par exemple une bille), l'échantillon doit être orienté de telle sorte que les franges sont situés autour de l'élément, comme dans la figure 3.
- Obtenir un balayage conformément aux instructions de l'instrument. Il peut être nécessaire d'ajuster la hauteur de l'éclairage ou de numérisation afin d'obtenir la meilleure carte topographique. Remplissez les données incorrectes ou manquantes à l'aide de la fonction interpoler, puis enregistrez la carte topographique.
2. Analyse volume à l'aide du logiciel générique
En tribologie, machines d'essais emploient souvent non conformes géométries tests de contact comme une boule ou un cylindre qui est glissée ou tournée contre un cylindre plat ou d'une autre. En règle générale, le matériel est perdu au point de contact glissant, bien que parfois matériau peut passer d'une surface à une autre, et cette «couche de transfert» sera mesuré comme un surplus de matière sur lee des échantillons de contact. Parce que la cicatrice d'usure est en trois dimensions et irrégulières dans la nature, profilométrie optique peut être la seule technique appropriée pour obtenir des mesures précises du volume d'usure - approximations sont pas valides. L'objectif est de mesurer les très faibles quantités de matière qui peut être perdu (ou gagné) dans la zone de contact à la fin de l'essai.
Le principe de base de la mesure est de définir un plan mathématique au niveau de la surface initiale: le logiciel d'analyse de surface suppose qu'il existe une «surface solide» (niveau zéro), quelle que soit au-dessus de ce niveau est «vide». La fonction d'analyse qui mesure le volume intégré enlevé en dessous du plan de la «surface solide» sera dénommé «volume mort». La fonction qui permet de mesurer le volume intégré au-dessus du plan de la «surface solide" (par exemple l'accumulation de débris) sera appelé le "volume important".
Réels surfaces intactes are rarement parfaitement lisse et plat. Pour une meilleure précision dans la mesure de petits éléments, il est recommandé de définir une zone d'intérêt (AOI), la zone à l'extérieur de ce qui est exclu de l'analyse. L'AOI est utilisé pour restreindre la zone de mesure en raison des irrégularités de la surface de contribuer volume supplémentaire pour les calculs qui n'est pas vraiment de la zone perturbée.
3. Surface plane - Analyse usure mécanique
- L'analyse du volume d'une surface plane avec une cicatrice tranchée ou la dépression, qu'elle soit générée par l'usure mécanique, faisceau d'ions, ou l'ablation laser, est facile à réaliser. Obtenir une image telle que la figure 4 qui montre à gauche une cicatrice mécanique sur une surface en acier poli. Sélectionnez un AOI, qui exclut la dépression et ensuite utiliser ce que l'inclinaison et / ou fonction de suppression courbure est disponible pour niveler la surface tranquille de planéité maximum. Ensuite, utilisez le logiciel pour régler la hauteur moyenne de la surface à Z =0. Figure 4 est une vue en pseudo-droit d'une cicatrice sur une surface plane après ces étapes. Dans cette perspective, le "volume des vides" exclus est teintée de rouge. Dans ce jeu de couleurs, le brun foncé indique les zones basses, tandis que l'orange indique les zones élevées.
- Supprimer l'AOI. Si le logiciel dispose d'une fonction de mesure automatique des volumes, placez une région de mesure sur la cicatrice. Dans ce logiciel, la fonction de mesure compterons le «vide et le volume de matériau" montré avec une teinte bleue dans la Figure 5. Usure totale est de «volume important» au dessus du plan soustraite de "volume vide." Il s'agit de la variation de volume de la surface perturbée. (Pour les logiciels qui ne possède pas cette fonction, mais il possède un histogramme, ou de visualiser clairement les zones qui sont élevés au-dessus de la surface ou sous la surface sont, ignorez l'étape 3.2 et passez à l'étape 3.3.)
Les trois étapes suivantes décrivent une méthode alternative de mesure du volume d'usure.
- Inverser l'AOIà partir de l'étape 3.1 pour permettre à la région de la cicatrice à analyser (la cicatrice est inclus maintenant).
- Générer un histogramme des données. L'histogramme est un graphique de la hauteur verticale sur l'axe des abscisses vs la fréquence d'apparition sur l'axe des ordonnées. Placez un curseur à la position de Z = 0 (figure 6 gauche). Cela peut ne pas être à la pointe de l'histogramme. Dans cette figure, les curseurs ont été mis en place pour analyser de manière sélective uniquement le matériel manquant en dessous du plan. Le logiciel intègre le volume total entre les deux curseurs. La zone rouge teinté montre ce qui est omis. Les zones orange non teinté dans la figure 6 droite sont en dessous de la surface. La fonction de l'histogramme doit générer un "volume mort" nombre avec les curseurs disposés comme illustré à mesurer la perte de matière à partir de la surface.
- En utilisant le même histogramme, placer le curseur autre moment dans la position de hauteur Z = 0 (figure 7 gauche), et d'autre part à l'extrémité opposée. Les zones orange non teinté dans Figure 7 ci-dessus sont à droite de la surface. La fonction histogramme devrait générer un «volume important» nombre, leur matériau excédentaire soit élevé au-dessus de la surface plane. Usure totale est "volume de matériau" soustrait "volume vide», le même que dans l'étape 3.2. La méthode par histogramme devrait donner le volume d'usure comme à l'étape 3.2, mais il fournit des détails supplémentaires sur la distribution de matériel levée et abaissée, et montre une carte de la répartition de cette région.
Dans l'exemple ci-dessus il n'y a pas de matériel net perdu de la cicatrice d'usure, à la place il ya un gain matériel. C'est inhabituel, mais se produit parfois lorsque le matériau transfère d'une contre-face essai à l'autre.
Les mêmes "plates" caractérisation de surface approches sont bénéfiques pour l'obtention de volumes retirés dans des expériences avec pulvérisation ionique et l'ablation laser, considéré dans les exemples qui suivent.
4. Surface plane - Cratères et Ion Beam ProMesures fichiers pour estimer le rendement de pulvérisation, et pour effectuer temps-profondeur d'étalonnage
Comme alternative à la méthode connue et largement utilisée pour estimer les rendements de pulvérisation en utilisant la méthode de perte de masse, basé sur la pesée directe ou microcristaux de quartz équilibre, 8, 9, nous trouvons que la méthode WLI est utile pour la visualisation directe du faisceau d'ions pulvérisés taches / cratères obtenus par pulvérisation statique / trame de balayage d'un faisceau d'ions. Figure 8 compare les coupes longitudinales d'un point (vert solides et bleu pointillé) d'une incidence normale statique 5 keV et 150 eV Ar + faisceaux d'ions contre leurs cratères (olive ouvert cercles et cyan losanges vides) obtenue par 100 × 100 pixels de balayage trame numérique du faisceau d'ions sur la même surface d'un Cu (110) monocristallin. La courbe correspondant aux faisceaux statiques chevauche un bord du cratère pour montrer comment balayage de trame du faisceau d'ions produit par pulvérisation cathodique pendant le cratère depth profilage.
5. Surface plane - Caractérisation de l'ablation laser ultrarapide
Laser ultra-rapide d'ablation est reconnue comme une méthode pour enlever de la matière de l'état solide tout en minimisant la zone affectée par la chaleur. 10 Ce processus permet micro-usinage taux élevé avec des rapports d'aspect élevés et des dommages minimes (craquage, oxydation) pour le reste du matériel, et ouvre la possibilité de l'ablation efficace des matériaux transparents. 11 Plus récemment, l'intérêt s'est développé en utilisant l'ablation ultrarapide comme outil d'analyse. 12-15 La non-linéarité élevée du processus d'ablation fournit également un moyen de réduire la taille du spot ablation nettement inférieur à la taille du point irradié ( comme c'est généralement définie par 1 / e 2) et même en dessous de la limite de diffraction, comme cela a été démontré. résolution 16 de profondeur, tout en n'étant pas en concurrence avec les meilleures méthodes de faisceaux d'ions, peut être <20 nm. Les taux d'élimination peut être facilement augmenténon linéairement en augmentant la fluence du laser, de sorte que le profilage très rapide à travers microns de matériau est possible. Idéalement, la caractérisation de l'enlèvement de matière par ablation ultra-rapide nécessite une technique qui est rapide et quantitative et bien calibrée, toutes les caractéristiques remplies par WLI.
La figure 9 montre des images pseudocolor de deux cratères voisins formés par ablation répétitive de GaAs avec un ultra-rapide (60 fs, 800 nm) du faisceau laser focalisé en un spot de ≈ 8 pm et ayant des fluences correspondant à 0,4 et 1,0 J / cm 2.
6. Surfaces courbes - Analyse usure mécanique
L'analyse du volume d'une surface courbe régulière (bille ou cylindre) est similaire à celle d'une villa, mais nécessite l'enlèvement courbure. Le protocole ci-dessous montre l'analyse d'une marque d'usure circulaire sur une bille d'acier. Pour trouver le volume perdu par une balle, il est nécessaire de faire un traitement mathématique pour transformer une balle avec unzone plate dans un plan plat avec une indentation, puis de mesurer le volume de l'empreinte comme dans la section 3 sur les surfaces planes. Une cicatrice d'usure sur une boule sera mesuré, d'abord en utilisant la technique plus simple automatique, puis avec la technique des histogrammes.
- Figure 10 gauche montre une vue isométrique d'une cicatrice d'usure sur un ballon. Sélectionnez un AOI qui exclut la cicatrice d'usure, et sélectionnez l'outil courbe de logiciel d'adaptation qui va transformer la surface de sorte que c'est une dépression usée au milieu d'une zone non perturbée plat. Parce que le retrait courbure peut être une technique itérative, il peut être nécessaire d'exécuter plusieurs fois plusieurs ajustement pour que la zone non perturbée est à plat nm Précision du niveau. Toute non-uniformité visible en dehors de la marque d'usure indique un problème et le calcul ne sera pas correcte. Réglez la hauteur moyenne en dehors de la cicatrice à Z = 0. Figure 10 droite montre une vue en pseudo de la cicatrice après l'enlèvement courbure et réglage Z = 0 avec un AOI correctementmasquage de la zone usée.
- Utilisez l'outil de mesure, le cas échéant, d'analyser l'usure, comme le montre la figure 11. Volume d'usure totale est "volume de matériau" soustrait du "volume des vides."
Les étapes suivantes décrivent une méthode alternative de mesure du volume d'usure.
- De la même manière que l'étape 3.3, inverser la ZI de sorte que la cicatrice d'usure est inclus. Générer un histogramme des données. Placez un curseur à la position de Z = 0 (figure 12 à gauche). Les zones orange non teinté dans la figure 12 de droite sont en dessous de la surface. La fonction histogramme devrait générer un "volume mort" nombre.
- En utilisant le même histogramme, placer le curseur autre moment dans la position de hauteur Z = 0 (figure 13 gauche), et d'autre part à l'extrémité opposée. Les zones orange non teinté dans la figure 13 droite dessus de la surface. La fonction histogramme devrait générer un «volume important» numéro. Totalporter le volume est "volume de matière" au-dessus du plan soustraite de "volume vide», le même que dans l'étape 3.2. La méthode par histogramme doit calculer le volume d'usure comme à l'étape 6.2, mais il fournit des détails supplémentaires sur la distribution de matériel levée et abaissée, et montre une carte de la répartition de cette région.
Access restricted. Please log in or start a trial to view this content.
Résultats
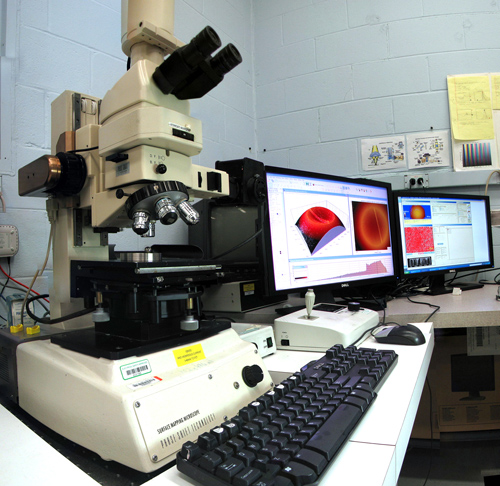
Figure 1 Photographie d'un profilomètre simple utilisé dans la présente étude:. Une tourelle à objectifs multiples est vu dans l'image. Deux objectifs sont standard (10x et 50x), et deux sont des objectifs Mirau (10x et 50x). Ce microscope possède une fonction de grossissement intermédiaire qui permet aux multiplicateurs d'agrandissement étape-sages de ...
Access restricted. Please log in or start a trial to view this content.
Discussion
Exemple 1
WLI n'est pas largement utilisée pour la caractérisation tribologique de surface dans le travail, mais il est en fait une méthode puissante pour la mesure quantitative des volumes d'usure pour de nombreuses géométries de contact. WLI produit une représentation en 3D de la surface qui peut être analysée en utilisant un des nombreux logiciels de visualisation. Ces paquets permettre différents types de mesures à effectuer. Pour une résolution latérale supérieure, les...
Access restricted. Please log in or start a trial to view this content.
Déclarations de divulgation
Aucun conflit d'intérêt déclaré.
Remerciements
L'échantillon irradié GaAs a été fourni par Cui Yang de l'Université de l'Illinois à Chicago. Ce travail a été soutenu au titre du contrat n ° DE-AC02-06CH11357 entre UChicago Argonne, LLC et le Département américain de l'énergie et par la NASA grâce à des subventions et NNH08AH761 NNH08ZDA001N, et le Bureau des technologies des véhicules du Département américain de l'énergie sous contrat DE-AC02 -06CH11357. La microscopie électronique a été réalisée au Centre de Microscopie Electronique for Materials Research de l'Argonne National Laboratory, US Department of Energy Office of Science de laboratoire, exploité sous contrat DE-AC02-06CH11357 par UChicago Argonne, LLC.
Access restricted. Please log in or start a trial to view this content.
matériels
| Name | Company | Catalog Number | Comments |
| Monocristallin des substrats de Si, GaAs et Cu | pour la pulvérisation et l'ablation | ||
| Alliages de métaux purs | pour des exemples de tribologie |
Références
- Gao, F., Leach, R. K., Petzing, J., Coupland, J. M. Surface measurement errors using commercial scanning white light interferometers. Meas. Sci. Technol. 19, 015303(2008).
- Cheng, Y. -Y., Wyant, J. C. Multiple-wavelength phase-shifting interferometry. Appl. Opt. 24, 804-807 (1985).
- Kino, G. S., Chim, S. S. C. Mirau correlation microscope. Appl. Opt. 29, 3775-3783 (1990).
- Wyant, J. C. White light interferometry. Proc. SPIE. 4737, 98-107 (2002).
- Sakseev, D. A., Ershenko, E. M., Baryshev, S. V., Bobyl, A. V., Agafonov, D. V. Deep microrelief measurement and stereo photography in scanning electron microscopy. Tech. Phys. 56, 127-131 (2011).
- Morris, R. J. H., Dowsett, M. G. Ion yields and erosion rates for Si1-xGex (0≤x≤1) ultralow energy O2+ secondary ion mass spectrometry in the energy range of 0.25-1 keV. J. Appl. Phys. 105, 114316(2009).
- O'Mahony, C., Hill, M., Brunet, M., Duane, R., Mathewson, A. Characterization of micromechanical structures using white-light interferometry. Meas. Sci. Technol. 14, 1807-1814 (2003).
- Andersen, H. H., Bay, H. L. Sputtering yield measurements. Topics in Applied Physics. Behrisch, R. 47: Sputtering by Particle Bombardment, Springer-Verlag. Berlin, Heidelberg. 145-218 (1981).
- Wu, S. -M., de Kruijs, R. van, Zoethout, E., Bijkerk, F. Sputtering yields of Ru, Mo, and Si under low energy Ar+ bombardment. J. Appl. Phys. 106, 054902(2009).
- Liu, X., Du, D., Mourou, G. Laser ablation and micromachining with ultrashort laser pulses. IEEE J. Quantum Electron. 33, 1706-1716 (1997).
- Gattass, R. R., Mazur, E. Femtosecond laser micromachining in transparent materials. Nature Photonics. 2, 219-225 (2008).
- Russo, R. E., Mao, X., Gonzalez, J. J., Mao, S. S. Femtosecond laser ablation. ICP-MS. J. Anal. At. Spectrom. 17, 1072-1075 (2002).
- Brady, J. J., Judge, E. J., Levis, R. J. Analysis of amphiphilic lipids and hydrophobic proteins using nonresonant femtosecond laser vaporization with electrospray post-ionization. J. Am. Soc. Mass Spectrom. 22, 762-772 (2011).
- Berry, J. I., Sun, S., Dou, Y., Wucher, A., Winograd, N. Laser desorption and imaging of proteins from ice via UV femtosecond laser pulses. Anal. Chem. 75, 5146-5151 (2003).
- Coello, Y., Jones, A. D., Gunaratne, T. C., Dantus, M. Atmospheric pressure femtosecond laser imaging mass spectrometry. Anal. Chem. 82, 2753-2758 (2010).
- Korte, F., Serbin, J., Koch, J., Egbert, A., Fallnich, C., Ostendorf, A., Chichkov, B. N. Towards nanostructuring with femtosecond laser pulses. Appl. Phys. A. 77, 229-235 (2003).
- Fu, Y., Bryan, N. K. A., Shing, O. N., Wyan, H. N. P. Influence analysis of dwell time on focused ion beam micromachining in silicon. Sensors and Actuators A. 79, 230-234 (2000).
- Jiang, F., Li, J., Yan, L., Sun, J., Zhang, S. Optimizing end-milling parameters for surface roughness under different cooling/lubrication conditions. Int. J. Adv. Manuf. Technol. 51, 841-851 (2010).
- Reiter, A. E., Mitterer, C., Figueiredo, M. R., Franz, R. Abrasive and adhesive wear behavior of arc-evaporated Al1-xCrxN hard coatings. Tribol. Lett. 37, 605-611 (2010).
- Devillez, A., Lesko, S., Mozer, W. Cutting tool crater wear measurement with white light interferometry. Wear. 256, 56-65 (2004).
- Shekhawat, V. K., Laurent, M. P., Muehleman, C., Wimmer, M. A. Surface topography of viable articular cartilage measured with scanning white light interferometry. Osteoarthritis and Cartilage. 17, 1197-1203 (2009).
- Hershberger, J., Öztürk, O., Ajayi, O. O., Woodford, J. B., Erdemir, A., Erck, R. A., Fenske, G. R. Evaluation of DLC coatings for spark-ignited, direct-injected fuel systems. Surf. Coat. Technol. 179, 237-244 (2004).
- Ajayi, O. O., Erck, R. A., Lorenzo-Martin, C., Fenske, G. R. Frictional anisotropy under boundary lubrication: Effect of surface texture. Wear. 267, 1214-1219 (2009).
- Wittmaack, K. Analytical description of the sputtering yields of silicon bombarded with normally incident ions. Phys. Rev. B. 68, 235211-23 (2003).
- Zeuner, M., Neumann, H., Scholze, F., Flamm, D., Tartz, M., Bigl, F. Characterization of a modular broad beam ion source. Plasma Sources Sci. Technol. 7, 252-267 (1998).
- Barna, A., Menyhard, M., Kotis, L., Kovacs, G. J., Radnoczi, G., Zalar, A., Panjan, P. Unexpectedly high sputtering yield of carbon at grazing angle of incidence ion bombardment. J. Appl. Phys. 98, 024901(2005).
- Weck, A., Crawford, T. H. R., Wilkinson, D. S., Haugen, H. K., Preston, J. S. Laser drilling of high aspect ratio holes in copper with femtosecond, picosecond and nanosecond pulses. Appl. Phys. A. 90, 537-543 (2008).
- Roosendaal, H. E. Sputtering yields of single crystalline targets. Topics in Applied Physics. ed, I. .,B. ehrisch,R. ., 47: Sputtering by Particle Bombardment, Springer-Verlag. Berlin, Heidelberg. 219-256 (1981).
- Seah, M. P. An accurate semi-empirical equation for sputtering yields II: For neon, argon and xenon ions. Nucl. Instrum. Methods Phys. Res. B. 229, 348-358 (2005).
- Seah, M. P., Clifford, C. A., Green, F. M., Gilmore, I. S. An accurate semi-empirical equation for sputtering yields I: For argon ions. Surf. Interface Anal. 37, 444-458 (2005).
- James Ziegler - SRIM & TRIM [Internet]. , Available from: http://www.srim.org/ (2011).
- Moller, W., Eckstein, W. Tridyn - A TRIM simulation code including dynamic composition changes. Nucl. Instrum. Methods Phys. Res. B. 2, 814-818 (1984).
- Insepov, Z., Norem, J., Veitzer, S. Atomistic self-sputtering mechanisms of rf breakdown in high-gradient linacs. Nucl. Instrum. Methods Phys. Res. B. 268, 642-650 (2010).
- Puech, L., Dubarry, C., Ravel, G., de Vito, E. Modeling of iron oxide deposition by reactive ion beam sputtering. J. Appl. Phys. 107, 054908(2010).
- Ho, S., Tamakoshi, T., Ikeda, M., Mikami, Y., Suzuki, K. Net sputtering rate due to hot ions in a Ne-Xe discharge gas bombarding an MgO layer. J. Appl. Phys. 109, 084908(2011).
- Nakles, M. R. Experimental and Modeling Studies of Low-Energy Ion Sputtering for Ion Thrusters [dissertation]. , Virginia Polytechnic Institute and State University. 1-129 (1988).
- Hada, M., Ninomiya, S., Seki, T., Aoki, T., Matsuo, J. Using ellipsometry for the evaluation of surface damage and sputtering yield in organic films with irradiation of argon cluster ion beams. Surf. Interface Anal. 43, 84-87 (2011).
- Kozole, J., Wucher, A., Winograd, N. Energy deposition during molecular depth profiling experiments with cluster ion beams. Anal. Chem. 80, 5293-5301 (2008).
- Linde, D. vonder, Sokolowski-Tinten, K. The physical mechanisms of short-pulse laser ablation. Appl. Surf. Sci. 154-155, 1-10 (2000).
- Margetic, V., Bolshov, M., Stockhaus, A., Niemax, K., Hergenroder, R. Depth profiling of multi-layer samples using femtosecond laser ablation. J. Anal. At. Spectrom. 16, 616-621 (2001).
- Cui, Y., Moore, J. F., Milasinovic, S., Liu, Y., Gordon, R. J., Hanley, L. Depth profiling and imaging capabilities of an ultrashort pulse laser ablation time of flight mass spectrometer. Rev. Sci. Instrum. 83, 093702(2012).
- Borowiec, A., MacKenzie, M., Weatherly, G. C., Haugen, H. K. Femtosecond laser pulse ablation of GaAs and InP: Studies utilizing scanning and transmission electron microscopy. Appl. Phys. A. 77, 411-417 (2003).
- Harasaki, A., Schmit, J., Wyant, J. C. Offset of coherent envelope position due to phase change on reflection. Appl. Opt. 40, 2102-2106 (2001).
- Luttge, A., Arvidson, R. S. Reactions at surfaces: A new approach integrating interferometry and kinetic simulations. J. Am. Ceram. Soc. 93, 3519-3530 (2010).
- Conroy, M., Mansfield, D. Scanning interferometry: Measuring microscale devices. Nature Photonics. 2, 661-663 (2008).
- Harasaki, A., Wyant, J. C. Fringe modulation skewing effect in white-light vertical scanning interferometry. Appl. Opt. 39, 2101-2106 (2000).
- Roy, M., Schmit, J., Hariharan, P. White-light interference microscopy: Minimization of spurious diffraction effects by geometric phase-shifting. Opt. Express. 17, 4495-4499 (2009).
Access restricted. Please log in or start a trial to view this content.
Réimpressions et Autorisations
Demande d’autorisation pour utiliser le texte ou les figures de cet article JoVE
Demande d’autorisationExplorer plus d’articles
This article has been published
Video Coming Soon