È necessario avere un abbonamento a JoVE per visualizzare questo. Accedi o inizia la tua prova gratuita.
Method Article
Caratterizzazione delle modificazioni superficiali di White Interferometria Luce: Applicazioni in Ion Sputtering, ablazione laser, ed esperimenti Tribologia
In questo articolo
Riepilogo
Bianco interferometria microscopio ottico è un metodo ottico, senza contatto e rapido per misurare la topografia di superfici. È mostrato come il metodo può essere applicato verso analisi usura meccanica, dove indossare cicatrici su campioni di prova sono analizzati tribologiche e nella scienza dei materiali per determinare ion beam sputtering o volumi di ablazione laser e profondità.
Abstract
Nella scienza dei materiali e ingegneria è spesso necessario per ottenere misure quantitative di topografia superficiale con risoluzione micrometrica laterale. Dalla superficie misurata, 3D topografici possono essere successivamente analizzati utilizzando una varietà di pacchetti software per estrarre le informazioni necessarie.
In questo articolo viene descritto come l'interferometria a luce bianca, e profilometria ottica (OP) in generale, in combinazione con il software generico analisi di superficie, possono essere utilizzati per scienza dei materiali e attività di progettazione. In questo articolo, una serie di applicazioni di bianco interferometria luce per le indagini di modifiche di superficie in spettrometria di massa, e l'usura dei fenomeni in tribologia e lubrificazione sono dimostrati. Abbiamo caratterizzano i prodotti dell'interazione di semiconduttori e metalli con ioni energetici (sputtering), e irradiazione laser (ablazione), nonché ex situ di usura dei provini tribologiche. In particolare, si discuterà:
- Aspetti della tradizionale sputtering di ioni a base di spettrometria di massa come i tassi di sputtering / misurazioni rendimenti su Si e Cu e conseguente time-to-profondità di conversione.
- Risultati della caratterizzazione quantitativa della interazione della radiazione laser a femtosecondi con una superficie del semiconduttore. Questi risultati sono importanti per applicazioni quali spettrometria di massa ablazione, dove le quantità di materiale evaporato può essere studiato e controllato tramite durata di impulso e di energia per impulso. Così, determinando la geometria cratere si può definire risoluzione in profondità e laterale contro condizioni di impostazione sperimentali.
- Misure di parametri di rugosità superficiale in due dimensioni, e misurazioni quantitative della superficie di usura che si verificano a seguito di prove di attrito e usura.
Alcuni svantaggi legati, artefatti possibili e le valutazioni incertezza della luce biancainterferometria approccio sarà discusso e spiegato.
Introduzione
La superficie di materiali solidi determina in larga misura le proprietà di interesse per quei materiali: elettronica, strutturalmente e chimicamente. In molti settori della ricerca, l'aggiunta di materiale (per esempio, deposizione di film sottili da impulsi laser / magnetron sputtering deposizione, fisico / chimiche deposizione di vapore), rimozione di materiale (Reactive Ion Etching, ion sputtering, ablazione laser, ecc), o alcuni altri processi, devono essere caratterizzati. Inoltre, modifica di superficie attraverso l'interazione con impulsi di luce o di particelle cariche energetiche ha numerose applicazioni ed è di interesse fondamentale. Tribologia, lo studio di attrito e usura, è un altro settore di interesse. Su una scala da banco, una moltitudine di geometrie esistono prove tribologiche. Non-conformi geometrie contatti possono essere utilizzati, e una sfera o cilindro può essere fatto scorrere o ruotare contro una superficie piana, un altro pallone, o cilindro, per un periodo di tempo, e la quantità di materiale che viene rimosso measured. Perché la cicatrice usura è tridimensionale e irregolare in natura, profilometria ottica può essere l'unica tecnica adatta per ottenere accurate misurazioni di volume di usura. Attività di analisi comuni includono anche parametri di rugosità di superficie, altezza passo, perdita di volume del materiale, profondità trincea, e così via, tutti possono ottenere in aggiunta alla semplice visualizzazione topografia 2D e 3D.
Profilometria ottica si riferisce a qualsiasi metodo ottico utilizzato per ricostruire il profilo delle superfici. Metodi profilometrica includono interferometrica luce bianca, laser, o metodi confocale. Alcuni profilometri ottici ottenere informazioni attraverso approcci tradizionali basati su diffrazione limitata obiettivi microscopio. Per esempio, un laser di scansione può essere integrato con un microscopio per ottenere informazioni sul colore topografico e vero superfici. Un secondo metodo utilizza una tecnica che sfrutta la profondità estremamente piccola di focalizzazione di obiettivi convenzionali per assemblare un serioes di messa a fuoco "fette" di immagini della superficie per ottenere una mappa 3D topografica.
In questo lavoro si mostra come una luce bianca microscopio interferometrico / profilometro consente la misurazione della quantità di materiale perso durante i processi di usura meccanica, o durante processi materiali etching come ioni crateri sputtering o ablazione laser. La maggior attenzione è rivolta alla metodologia di questo metodo per illustrare la sua grande capacità installata che lo rende ampiamente disponibile e attraente per numerose applicazioni. La maggior parte dei tipi di WLI impiegare la tecnica Mirau, che utilizza uno specchio interno al microscopio obiettivo di provocare interferenza tra un segnale luminoso di riferimento e la luce riflessa dalla superficie del campione. La scelta di Mirau interferometria è dettata dalla semplice convenienza, perché l'interferometro intera Mirau può essere adattarsi all'interno della lente obiettivo microscopio e accoppiato ad un microscopio ottico normale (Figura 1). Una serie di bidimensionale traferograms sono acquisite con una videocamera, e il software assembla una mappa 3D topografica. La sorgente di luce bianca fornisce l'illuminazione ad ampio spettro che aiuta a superare l '"ordine di frangia" ambiguità intrinseca di una sorgente monocromatica. Una sorgente di luce monocromatica può essere utilizzato per ottenere una misurazione più accurata delle caratteristiche topografiche superficiali. La risoluzione laterale è fondamentalmente limitata a λ / 2 (apertura numerica NA = 1), ma nella maggior parte dei casi è maggiore, essendo determinata dalla NA dell'obiettivo, che è a sua volta collegato ad ingrandimento / campo di vista dimensioni. Tabella 1 in rif. 1 ha un confronto diretto di tutti i parametri menzionati. Approcci risoluzione in profondità ≈ 1 nm, essendo funzione della natura della tecnica interferometrica. Ulteriori informazioni su Mirau WLI può essere trovato in Refs. 2, 3. Un'introduzione su bianco approccio leggero interferometrica può essere trovato in rif. 4.
Altri metodi per l'analisi delle superfici sono atomiche force microscopia (AFM), microscopia elettronica a scansione (SEM), e profilometria stilo. La tecnica WLI paragonabile a questi metodi e ha i suoi vantaggi e svantaggi che dipendono dalla natura ottica del metodo.
L'AFM è in grado di ottenere immagini 3D e sezioni corrispondenti quindi, ma AFM ha una limitata capacità di scansione nelle laterali (<100 micron) e profondità (<10 micron) assi. A differenza di quelli, il vantaggio principale del WLI è flessibile campo di vista (FOV) di fino a pochi millimetri con simultanea reale capacità di imaging 3D. Inoltre, come dimostreremo ha ampia gamma di capacità di scansione verticale, permettendo di risolvere una varietà di problemi di modificazione superficiale semplicemente. I ricercatori che hanno lavorato con AFM sono consapevoli del problema di posizionamento del piano di un campione per misurare caratteristiche prolungati bassi gradienti verticali. In generale, si può pensare di WLI / OP come una tecnica di "espresso" su AFM. Naturalmente, ci sonouna serie di settori per i quali è adatto solo AFM: quando caratteristiche laterali da risolvere hanno dimensioni caratteristiche più piccole della risoluzione laterale WLI, o istanze dove i dati da WLI è ambigua a causa delle proprietà ottiche sconosciute o complesso di un campione in un modo che influisce sulla precisione delle misure (ne parliamo dopo), ecc
Il SEM è un potente mezzo per guardare superfici, essendo molto flessibile in termini di dimensioni FOV con grande profondità di messa a fuoco, più grande di qualsiasi microscopio ottico convenzionale in grado di offrire. Allo stesso tempo, imaging 3D da SEM è ingombrante, in particolare perché richiede di prendere stereo-pair immagini che poi vengono convertiti in immagini 3D con il metodo anaglifico, o osservando con visori ottici, o utilizzati per il calcolo diretto di profondità tra diversi punti di interesse su un campione. 5, invece, WLI / OP profilometria offre facile da usare, la ricostruzione 3D con al tempo stesso flessibile FOV. WLI scansione attraverso la pienaCampo altezza necessaria per il particolare campione (da nanometri a centinaia di micron). WLI è influenzato dalla conducibilità elettrica del materiale campione, che può essere un problema con SEM. WLI chiaramente non richiede un vuoto. D'altra parte ci sono una serie di applicazioni per cui SEM fornisce informazioni superior: caratteristiche laterali da risolvere di dimensioni caratteristiche sotto la risoluzione laterale WLI, o casi in cui le diverse parti di un campione può essere topograficamente distinte solo quando coefficienti di emissione di elettroni secondari differiscono.
Una tecnica più per ispezione superficiale, che è ampiamente usato in spettrometria di massa di ioni secondari 6 e nel campo dei sistemi microelettromeccanici caratterizzazione 7 è profilometria stilo. Questa tecnica è molto popolare per la sua semplicità e robustezza. Esso si basa sulla scansione contatto meccanico diretto di una puntina sulla superficie del campione. Si tratta di uno strumento di contatto grossolana, Che è in grado di eseguire la scansione lungo una linea alla volta. Rende superficie 3D raster-scan immagini molto tempo. Un altro inconveniente della tecnica stilo è la difficoltà di misurare caratteristiche superficiali di alto allungamento e di dimensioni comparabili con la sua dimensione caratteristica punta (submicron a diversi micron tipicamente) che implica un raggio di punta e un angolo al vertice punta. Un vantaggio di stilo profilometria è la sua insensibilità alle diverse proprietà ottiche di un campione, che possono influire sulla precisione di WLI / OP misure (ne parliamo dopo).
Le mappe di superficie nel presente articolo sono stati ottenuti utilizzando un convenzionale Mirau tipo WLI (Figura 1). Molte aziende, come Zygo, KLA-Tencor, nanoscienze, Zemetrics, Nanovea, FRT, Keyence, Bruker, e Taylor Hobson produrre commerciali strumenti OP da tavolo. Le mappe sono state ricostruite acquisiti ed elaborati tramite il software commerciale del tipo che viene comunemente utilizzato per WLI, scanning electron, or sonda microscopia. Il software ha la capacità di eseguire manipolazioni matematiche della superficie, attraversa profilo sezione di analisi, vuoto e il calcolo dei volumi di materiale, e la correzione aereo. Altri pacchetti software possono automatizzare alcune di queste caratteristiche.
Access restricted. Please log in or start a trial to view this content.
Protocollo
1. Allineamento Hardware Generale WLI Scan
Per ottenere informazioni quantitative attraverso WLI, le seguenti operazioni possono servire come linea guida. Si presume che l'operatore ha conoscenza di base del funzionamento dell'interferometro. Le linee guida sono comuni a prescindere dallo strumento specifico. Per alcune indagini, il campione sarà piatta. Per altri, il campione può essere curvato.
- Mettere il campione sul palco con la funzione (ione atomizzate cratere, un fascio ionico / spot ablato, o indossare cicatrice) rivolto verso l'alto. Utilizzare un basso ingrandimento obiettivo e mettere a fuoco lo strumento su di esso. Per ottenere la migliore risoluzione di una immagine in cui l'oggetto di interesse riempie gran parte dello schermo, vedere la Figura 2 per un esempio di una palla.
- Regolare la posizione verticale del campione in modo che frange di interferenza appaiono vicino alla caratteristica di interesse. Per una superficie piana, è auspicabile che il campione è inclinato in modo tale che il piano è perpendicular all'asse ottico, cioè la spaziatura frangia sarà grande. Per una superficie curva (ad esempio una sfera), il campione deve essere orientato in modo che frange in posizione centrale attorno alla caratteristica, come in figura 3.
- Ottenere una scansione secondo le istruzioni dello strumento. Potrebbe essere necessario regolare l'altezza di illuminazione o di scansione in modo da ottenere la migliore mappa topografica. Riempire eventuali dati errati o mancanti utilizzando la funzione di interpolazione, e quindi salvare la mappa topografica.
2. Utilizzo del software di analisi Volume generico
In tribologia, spesso impiegano macchine di prova non-conformi geometrie contatto di prova come una sfera o un cilindro che viene fatto scorrere o ruotare contro un cilindro piatto o altro. Tipicamente, il materiale è perso nel punto di contatto di scorrimento, anche se a volte può trasferire materiale da una superficie all'altra, e questo "strato di trasferimento" sarà misurata come un surplus di materiale sullae dei campioni contatto. Perché la cicatrice usura è tridimensionale e irregolare in natura, profilometria ottica può essere l'unica tecnica adatta per ottenere accurate misurazioni di volume di usura - approssimazioni non sono validi. L'obiettivo è quello di misurare le piccole quantità di materiale che possono essere persi (o acquisita) nella regione di contatto al completamento di un test.
Il principio di base della misurazione è quello di definire un piano di matematica a livello della superficie indisturbata: software di analisi superficie assume che vi sia una "superficie solida" (livello zero), qualunque sia sopra di questo livello è "vuoto". La funzione di analisi che misura il volume integrato rimosso sotto del piano della "superficie solida" verrà indicato come "volume vuoto". La funzione che misura il volume integrato di sopra del piano della "superficie solida" (ad esempio, un accumulo di detriti) sarà chiamato il "volume di materiale."
Reali superfici indisturbati are raramente perfettamente liscia e piana. Per una maggiore precisione nella misurazione caratteristiche di piccole dimensioni è buona per definire un'area di interesse (AOI), l'area al di fuori della quale è escluso dall'analisi. L'AOI viene utilizzato per limitare il campo di misurazione perché irregolarità nella superficie contribuiscono volume supplementare ai calcoli che non è veramente dalla zona disturbata.
3. Appartamento di superficie - Analisi usura meccanica
- Analisi del volume di una superficie piana con una cicatrice trincea o depressione, se generato da usura meccanica, un fascio ionico sputtering, o ablazione laser, è facile da eseguire. Ottenere un'immagine come figura 4 a sinistra che mostra una cicatrice meccanica su una superficie in acciaio lucido. Selezionare un AOI che esclude la depressione e quindi utilizzare qualsiasi inclinazione e / o la funzione di rimozione curvatura è disponibile per livellare la superficie di massima planarità indisturbato. Quindi utilizzare il software per impostare l'altezza media della superficie a Z =0. Figura 4 è una vista pseudocolore destra di una cicatrice su una superficie piana dopo questi passaggi. In questa visione gli esclusi "volume vuoto" si colora di rosso. In questo schema di colori, il marrone scuro indica le zone basse, mentre arancione denota zone alte.
- Eliminare il AOI. Se il software dispone di una funzione di misurazione automatizzata dei volumi, inserire una regione di misura sulla cicatrice. In questo software, la funzione di misura conteremo il "vuoto e il volume di materiale" indicata con tinta blu nella Figura 5. Usura totale è "volume materiale" al di sopra del piano sottratto dal "volume di vuoto." Questa è la variazione di volume della superficie disturbata. (Per il software che non dispone di questa funzione, ma ha un istogramma, o di visualizzare in modo chiaro quali aree sono sollevate sopra la superficie o sono al di sotto della superficie, saltare il punto 3.2 e passare al punto 3.3.)
I tre passaggi seguenti descrivono un metodo alternativo per misurare il volume di usura.
- Invertire la AOIdal punto 3.1 per consentire alla regione cicatrice da analizzare (la cicatrice è incluso ora).
- Generare un istogramma dei dati. L'istogramma è un grafico di altezza verticale in ascissa contro la frequenza di occorrenza sull'ordinata. Posizionare un cursore alla Z = posizione 0 (Figura 6 a sinistra). Questo non può essere al massimo dell'istogramma. In questa figura i cursori sono stati istituiti per analizzare selettivamente solo il materiale mancante di sotto del piano. Il software integra il volume totale tra i due cursori. La zona rossa colorata mostra ciò che viene omesso. Le aree arancioni Untinted destra in Figura 6 sono sotto la superficie. La funzione istogramma dovrebbe generare un "volume vuoto" numero con i cursori posizionati come mostrato per misurare la perdita di materiale dalla superficie.
- Utilizzando l'istogramma stesso, posizionare il cursore altra questa volta alla Z = 0 posizione di altezza (figura 7 a sinistra), e l'altro dalla parte opposta. Le zone arancioni incolore a Figura 7 a destra sono al di sopra della superficie. La funzione istogramma dovrebbe generare un "volume di materiale" numero, il materiale in eccesso cioè sollevata sopra la superficie piana. Usura totale è "volume di materiale" sottratto "volume vuoto," lo stesso come nella fase 3.2. Il metodo istogramma dovrebbe dare lo stesso volume di usura come al punto 3.2, ma fornisce ulteriori dettagli sulla distribuzione del materiale sollevato ed abbassato, e mostra una mappa della distribuzione di questa zona.
Nell'esempio sopra non c'è materiale netta perdita dalla cicatrice usura, invece c'è guadagno materiale. Questo è insolito, ma a volte si verifica quando il materiale passa da un controfaccia di prova ad un altro.
Gli stessi "flat superficie caratterizzazione" approcci sono utili per ottenere volumi rimossi in esperimenti con ion sputtering e ablazione laser, considerato negli esempi che seguono.
4. Appartamento di superficie - Crateri e Ion Beam ProMisure file da Stima Yield Sputtering, e per l'esecuzione di time-to-profondità di calibrazione
Come alternativa al metodo noto e ampiamente utilizzato per stimare rendimenti sputtering usando perdita di massa metodo, in base al peso diretto o quarzo equilibrio microcristalli, 8, 9 si trova che il metodo WLI è utile per la visualizzazione diretta del atomizzate punti di fasci di ioni / crateri ottenuti per sputtering statico / raster di scansione di un fascio di ioni. figura 8 confronta longitudinali sezioni trasversali di un punto (linee continue verdi e blu tratteggiate) di un normale incidente statico 5 keV e 150 eV Ar + fasci di ioni contro i loro crateri (di oliva aperto cerchi e ciano diamanti aperti) ottenuta con 100 × 100 pixel scansione raster digitale del fascio di ioni stessa sulla superficie di un Cu (110) cristallo singolo. La curva corrispondente alle sovrapposizioni fascio statici un bordo del cratere per dimostrare come raster scansione del fascio di ioni genera il cratere durante sputter depth profiling.
5. Superficie piana - Caratterizzazione di ablazione laser ultraveloce
Ultrafast ablazione laser è riconosciuta come un metodo per la rimozione di materiale da un solido, riducendo al minimo la zona termicamente alterata. 10 Questo processo consente micromachining alta velocità con proporzioni elevate e danni minima (cracking, ossidazione) per il materiale rimanente, e apre la possibilità di ablazione efficiente di materiali trasparenti. 11 Più recentemente, l'interesse si è sviluppato in ablazione ultraveloce utilizzando come strumento analitico. 12-15 La non linearità elevata del processo di ablazione fornisce anche un mezzo per ridurre la dimensione ablato posto significativamente inferiore alla dimensione di spot irradiati ( come tipicamente definita da 1 / e 2) e anche al di sotto del limite di diffrazione, come è stato dimostrato. 16 Profondità risoluzione, mentre non competitivo con i migliori metodi fasci ionici, può essere <20 nm. Tassi di rimozione può essere facilmente aumentatonon linearmente aumentando la fluenza laser, in modo che profili molto rapida attraverso micron di materiale è possibile. Idealmente, la caratterizzazione di rimozione del materiale mediante ablazione ultraveloce richiede una tecnica che è veloce e quantitativa e ben calibrata, tutte le caratteristiche soddisfatte dai WLI.
La figura 9 mostra immagini pseudocolori di due crateri vicini formate da ablazione ripetitiva di GaAs con ultraveloce (60 fs, 800 nm) del fascio laser focalizzato a una dimensione del punto di ≈ 8 micron e avente fluenze corrispondenti a 0,4 e 1,0 J / cm 2.
6. Superfici curve - Analisi usura meccanica
Analisi del volume di una superficie curva regolare (sfera o cilindro) è simile a quella di un piatto, ma richiede la rimozione curvatura. Il protocollo che segue mostra l'analisi di una cicatrice usura circolare su una sfera di acciaio. Per trovare il volume perso da una palla, è necessario eseguire l'elaborazione matematica per trasformare una palla con unsuperficie piatta in un piano piatto con una rientranza, quindi misurare il volume della rientranza come è stato fatto nella Sezione 3 su superfici piane. Una cicatrice usura su una palla saranno misurati, prima con la tecnica più semplice automatico, poi con la tecnica istogramma.
- Figura 10 sinistra mostra una vista isometrica di una cicatrice usura su una palla. Selezionare un AOI che esclude la cicatrice di usura, e selezionare lo strumento curva di interpolazione software che trasformerà la superficie in modo che si tratta di una depressione consumato nel bel mezzo di una zona indisturbata piana. Poiché rimozione curvatura può essere una tecnica iterativa può essere necessario eseguire le volte fit diverse in modo che l'area è piatta indisturbata a Nm livello di precisione. Qualsiasi visibile non uniformità al di fuori della cicatrice usura indica un problema e il calcolo non sarà corretta. Impostare l'altezza media fuori della cicatrice a Z = 0. Figura 10 mostra una vista destra pseudocolore della cicatrice dopo la rimozione curvatura e impostazione Z = 0 con un AOI correttamentemascherare la zona usurata.
- Utilizzare lo strumento di misura, se disponibile, per analizzare l'usura, come mostrato in Figura 11. Volume di usura totale è "volume materiale" sottratto dal "volume di vuoto."
Di seguito viene descritto un metodo alternativo per la misurazione del volume di usura.
- Nella stessa maniera passo 3,3, capovolgere la AOI modo che la cicatrice usura è inclusa. Generare un istogramma dei dati. Posizionare un cursore alla Z = posizione 0 (Figura 12 a sinistra). Le aree arancioni Untinted destra in Figura 12 sono sotto la superficie. La funzione istogramma dovrebbe generare un "volume di vuoto" numero.
- Utilizzando l'istogramma stesso, posizionare il cursore altra questa volta alla Z = 0 posizione di altezza (figura 13 a sinistra), e l'altro dalla parte opposta. Le zone arancioni incolore in Figura 13 a destra sono al di sopra della superficie. La funzione istogramma dovrebbe generare un "volume di materiale" numero. Totaleusura volume è "volume materiale" rispetto al piano sottratto dal "volume di vuoto," lo stesso come nella fase 3.2. Il metodo istogramma dovrebbe calcolare lo stesso volume di usura come al punto 6.2, ma fornisce ulteriori dettagli sulla distribuzione del materiale sollevato ed abbassato, e mostra una mappa della distribuzione di questa zona.
Access restricted. Please log in or start a trial to view this content.
Risultati
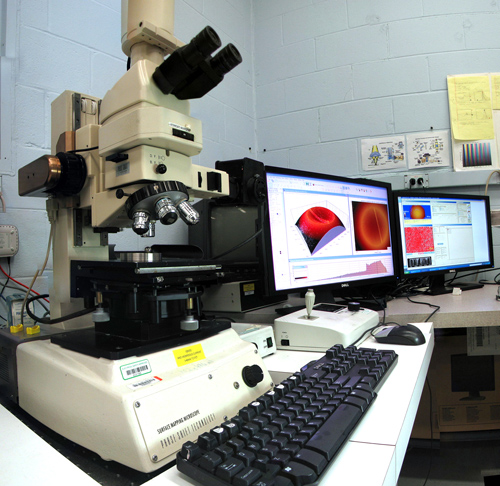
Figura 1 Fotografia di un profilometro semplice usato nel presente studio:. Una torretta obiettivo più si vede nella foto. Due obiettivi sono standard (10x e 50x), e due sono obiettivi Mirau (10x e 50x). Questo microscopio dispone di una funzione intermedia di ingrandimento che consente di graduale moltiplicatori ingrandimento di 0,62, 1,00, 1,25, 2,00 o da selezionare. <...
Access restricted. Please log in or start a trial to view this content.
Discussione
Esempio 1
WLI non è ampiamente utilizzato per la caratterizzazione della superficie in lavoro tribologiche, ma è in realtà un potente metodo per la misurazione quantitativa di volumi di usura per contatto geometrie molti. WLI produce una rappresentazione completa 3D della superficie che può essere analizzata utilizzando qualsiasi di diversi pacchetti software di visualizzazione. Questi pacchetti permettono vari tipi di misurazioni da effettuare. Per una maggiore risoluzione laterale, le imm...
Access restricted. Please log in or start a trial to view this content.
Divulgazioni
Nessun conflitto di interessi dichiarati.
Riconoscimenti
Il campione irradiato GaAs sono state fornite dal Cui Yang della University of Illinois di Chicago. Questo lavoro è stato finanziato nell'ambito del contratto n ° DE-AC02-06CH11357 tra UChicago Argonne, LLC e il Dipartimento dell'Energia degli Stati Uniti e dalla NASA tramite sovvenzioni e NNH08AH761 NNH08ZDA001N, e l'Ufficio di tecnologie per i veicoli del Dipartimento dell'Energia degli Stati Uniti sotto contratto DE-AC02 -06CH11357. La microscopia elettronica è stata realizzata presso il Centro di Microscopia Elettronica per la Ricerca dei Materiali presso Argonne National Laboratory, un US Department of Energy Office of Science di laboratorio, gestito nell'ambito del contratto DE-AC02-06CH11357 da UChicago Argonne, LLC.
Access restricted. Please log in or start a trial to view this content.
Materiali
| Name | Company | Catalog Number | Comments |
| Cristallo singolo substrati di Si, GaAs e Cu | per sputtering e ablazione | ||
| Leghe di metalli puri | per gli esempi tribologia |
Riferimenti
- Gao, F., Leach, R. K., Petzing, J., Coupland, J. M. Surface measurement errors using commercial scanning white light interferometers. Meas. Sci. Technol. 19, 015303(2008).
- Cheng, Y. -Y., Wyant, J. C. Multiple-wavelength phase-shifting interferometry. Appl. Opt. 24, 804-807 (1985).
- Kino, G. S., Chim, S. S. C. Mirau correlation microscope. Appl. Opt. 29, 3775-3783 (1990).
- Wyant, J. C. White light interferometry. Proc. SPIE. 4737, 98-107 (2002).
- Sakseev, D. A., Ershenko, E. M., Baryshev, S. V., Bobyl, A. V., Agafonov, D. V. Deep microrelief measurement and stereo photography in scanning electron microscopy. Tech. Phys. 56, 127-131 (2011).
- Morris, R. J. H., Dowsett, M. G. Ion yields and erosion rates for Si1-xGex (0≤x≤1) ultralow energy O2+ secondary ion mass spectrometry in the energy range of 0.25-1 keV. J. Appl. Phys. 105, 114316(2009).
- O'Mahony, C., Hill, M., Brunet, M., Duane, R., Mathewson, A. Characterization of micromechanical structures using white-light interferometry. Meas. Sci. Technol. 14, 1807-1814 (2003).
- Andersen, H. H., Bay, H. L. Sputtering yield measurements. Topics in Applied Physics. Behrisch, R. 47: Sputtering by Particle Bombardment, Springer-Verlag. Berlin, Heidelberg. 145-218 (1981).
- Wu, S. -M., de Kruijs, R. van, Zoethout, E., Bijkerk, F. Sputtering yields of Ru, Mo, and Si under low energy Ar+ bombardment. J. Appl. Phys. 106, 054902(2009).
- Liu, X., Du, D., Mourou, G. Laser ablation and micromachining with ultrashort laser pulses. IEEE J. Quantum Electron. 33, 1706-1716 (1997).
- Gattass, R. R., Mazur, E. Femtosecond laser micromachining in transparent materials. Nature Photonics. 2, 219-225 (2008).
- Russo, R. E., Mao, X., Gonzalez, J. J., Mao, S. S. Femtosecond laser ablation. ICP-MS. J. Anal. At. Spectrom. 17, 1072-1075 (2002).
- Brady, J. J., Judge, E. J., Levis, R. J. Analysis of amphiphilic lipids and hydrophobic proteins using nonresonant femtosecond laser vaporization with electrospray post-ionization. J. Am. Soc. Mass Spectrom. 22, 762-772 (2011).
- Berry, J. I., Sun, S., Dou, Y., Wucher, A., Winograd, N. Laser desorption and imaging of proteins from ice via UV femtosecond laser pulses. Anal. Chem. 75, 5146-5151 (2003).
- Coello, Y., Jones, A. D., Gunaratne, T. C., Dantus, M. Atmospheric pressure femtosecond laser imaging mass spectrometry. Anal. Chem. 82, 2753-2758 (2010).
- Korte, F., Serbin, J., Koch, J., Egbert, A., Fallnich, C., Ostendorf, A., Chichkov, B. N. Towards nanostructuring with femtosecond laser pulses. Appl. Phys. A. 77, 229-235 (2003).
- Fu, Y., Bryan, N. K. A., Shing, O. N., Wyan, H. N. P. Influence analysis of dwell time on focused ion beam micromachining in silicon. Sensors and Actuators A. 79, 230-234 (2000).
- Jiang, F., Li, J., Yan, L., Sun, J., Zhang, S. Optimizing end-milling parameters for surface roughness under different cooling/lubrication conditions. Int. J. Adv. Manuf. Technol. 51, 841-851 (2010).
- Reiter, A. E., Mitterer, C., Figueiredo, M. R., Franz, R. Abrasive and adhesive wear behavior of arc-evaporated Al1-xCrxN hard coatings. Tribol. Lett. 37, 605-611 (2010).
- Devillez, A., Lesko, S., Mozer, W. Cutting tool crater wear measurement with white light interferometry. Wear. 256, 56-65 (2004).
- Shekhawat, V. K., Laurent, M. P., Muehleman, C., Wimmer, M. A. Surface topography of viable articular cartilage measured with scanning white light interferometry. Osteoarthritis and Cartilage. 17, 1197-1203 (2009).
- Hershberger, J., Öztürk, O., Ajayi, O. O., Woodford, J. B., Erdemir, A., Erck, R. A., Fenske, G. R. Evaluation of DLC coatings for spark-ignited, direct-injected fuel systems. Surf. Coat. Technol. 179, 237-244 (2004).
- Ajayi, O. O., Erck, R. A., Lorenzo-Martin, C., Fenske, G. R. Frictional anisotropy under boundary lubrication: Effect of surface texture. Wear. 267, 1214-1219 (2009).
- Wittmaack, K. Analytical description of the sputtering yields of silicon bombarded with normally incident ions. Phys. Rev. B. 68, 235211-23 (2003).
- Zeuner, M., Neumann, H., Scholze, F., Flamm, D., Tartz, M., Bigl, F. Characterization of a modular broad beam ion source. Plasma Sources Sci. Technol. 7, 252-267 (1998).
- Barna, A., Menyhard, M., Kotis, L., Kovacs, G. J., Radnoczi, G., Zalar, A., Panjan, P. Unexpectedly high sputtering yield of carbon at grazing angle of incidence ion bombardment. J. Appl. Phys. 98, 024901(2005).
- Weck, A., Crawford, T. H. R., Wilkinson, D. S., Haugen, H. K., Preston, J. S. Laser drilling of high aspect ratio holes in copper with femtosecond, picosecond and nanosecond pulses. Appl. Phys. A. 90, 537-543 (2008).
- Roosendaal, H. E. Sputtering yields of single crystalline targets. Topics in Applied Physics. ed, I. .,B. ehrisch,R. ., 47: Sputtering by Particle Bombardment, Springer-Verlag. Berlin, Heidelberg. 219-256 (1981).
- Seah, M. P. An accurate semi-empirical equation for sputtering yields II: For neon, argon and xenon ions. Nucl. Instrum. Methods Phys. Res. B. 229, 348-358 (2005).
- Seah, M. P., Clifford, C. A., Green, F. M., Gilmore, I. S. An accurate semi-empirical equation for sputtering yields I: For argon ions. Surf. Interface Anal. 37, 444-458 (2005).
- James Ziegler - SRIM & TRIM [Internet]. , Available from: http://www.srim.org/ (2011).
- Moller, W., Eckstein, W. Tridyn - A TRIM simulation code including dynamic composition changes. Nucl. Instrum. Methods Phys. Res. B. 2, 814-818 (1984).
- Insepov, Z., Norem, J., Veitzer, S. Atomistic self-sputtering mechanisms of rf breakdown in high-gradient linacs. Nucl. Instrum. Methods Phys. Res. B. 268, 642-650 (2010).
- Puech, L., Dubarry, C., Ravel, G., de Vito, E. Modeling of iron oxide deposition by reactive ion beam sputtering. J. Appl. Phys. 107, 054908(2010).
- Ho, S., Tamakoshi, T., Ikeda, M., Mikami, Y., Suzuki, K. Net sputtering rate due to hot ions in a Ne-Xe discharge gas bombarding an MgO layer. J. Appl. Phys. 109, 084908(2011).
- Nakles, M. R. Experimental and Modeling Studies of Low-Energy Ion Sputtering for Ion Thrusters [dissertation]. , Virginia Polytechnic Institute and State University. 1-129 (1988).
- Hada, M., Ninomiya, S., Seki, T., Aoki, T., Matsuo, J. Using ellipsometry for the evaluation of surface damage and sputtering yield in organic films with irradiation of argon cluster ion beams. Surf. Interface Anal. 43, 84-87 (2011).
- Kozole, J., Wucher, A., Winograd, N. Energy deposition during molecular depth profiling experiments with cluster ion beams. Anal. Chem. 80, 5293-5301 (2008).
- Linde, D. vonder, Sokolowski-Tinten, K. The physical mechanisms of short-pulse laser ablation. Appl. Surf. Sci. 154-155, 1-10 (2000).
- Margetic, V., Bolshov, M., Stockhaus, A., Niemax, K., Hergenroder, R. Depth profiling of multi-layer samples using femtosecond laser ablation. J. Anal. At. Spectrom. 16, 616-621 (2001).
- Cui, Y., Moore, J. F., Milasinovic, S., Liu, Y., Gordon, R. J., Hanley, L. Depth profiling and imaging capabilities of an ultrashort pulse laser ablation time of flight mass spectrometer. Rev. Sci. Instrum. 83, 093702(2012).
- Borowiec, A., MacKenzie, M., Weatherly, G. C., Haugen, H. K. Femtosecond laser pulse ablation of GaAs and InP: Studies utilizing scanning and transmission electron microscopy. Appl. Phys. A. 77, 411-417 (2003).
- Harasaki, A., Schmit, J., Wyant, J. C. Offset of coherent envelope position due to phase change on reflection. Appl. Opt. 40, 2102-2106 (2001).
- Luttge, A., Arvidson, R. S. Reactions at surfaces: A new approach integrating interferometry and kinetic simulations. J. Am. Ceram. Soc. 93, 3519-3530 (2010).
- Conroy, M., Mansfield, D. Scanning interferometry: Measuring microscale devices. Nature Photonics. 2, 661-663 (2008).
- Harasaki, A., Wyant, J. C. Fringe modulation skewing effect in white-light vertical scanning interferometry. Appl. Opt. 39, 2101-2106 (2000).
- Roy, M., Schmit, J., Hariharan, P. White-light interference microscopy: Minimization of spurious diffraction effects by geometric phase-shifting. Opt. Express. 17, 4495-4499 (2009).
Access restricted. Please log in or start a trial to view this content.
Ristampe e Autorizzazioni
Richiedi autorizzazione per utilizzare il testo o le figure di questo articolo JoVE
Richiedi AutorizzazioneEsplora altri articoli
This article has been published
Video Coming Soon