Method Article
Lithographie de faisceau d’électrons à un seul chiffre nanomètre avec une correction de l’Aberration Transmission Microscope électronique à balayage
Dans cet article
Résumé
Nous utilisons un correction de l’aberration transmission microscope électronique à balayage pour définir des modèles à un seul chiffre nanomètre dans deux faisceaux d’électrons largement utilisé résiste : poly (méthacrylate de méthyle) et hydrogène SILSESQUIOXANES. Résister à motifs peuvent être reproduits dans des matériaux de choix cible avec une fidélité à un seul chiffre nanomètre à l’aide de décollage, gravure plasma et résister à l’infiltration de substances organométalliques.
Résumé
Nous démontrons résiste à l’extension de faisceau d’électrons Lithographie l’utilisation conventionnelle et transfert de motif traite aux dimensions nanométriques à un seul chiffre en utilisant un correction de l’aberration transmission microscope électronique à balayage comme l’outil d’exposition. Nous présentons ici les résultats de structuration nanomètre à un chiffre de deux faisceaux d’électrons largement utilisé résiste : poly (méthacrylate de méthyle) et hydrogène SILSESQUIOXANES. La méthode réalise le nanomètre sup-5 caractéristiques en poly (méthacrylate de méthyle) et résolution sub-10 nanomètre en hydrogène SILSESQUIOXANES. Transfert de haute fidélité de ces modèles en matériaux cible de choix peut être effectuée à l’aide de métal déjaugeage, plasma etch et résister à l’infiltration d’organométalliques.
Introduction
Le protocole présenté dans ce manuscrit fournit des indications permettant de définir des modèles avec une résolution nanométrique à un seul chiffre en poly (méthacrylate de méthyle) (PMMA) et hydrogène SILSESQUIOXANES (HSQ), qui sont deux communes de résiste à faisceau d’électrons utilisé dans modélisation à haute résolution de lithographie par faisceau d’électrons. Nous parvenir à ces résultats en utilisant un correction de l’aberration transmission microscope électronique à balayage (tige) comme l’outil d’exposition, équipé d’un générateur de mires pour contrôler le faisceau d’électrons. Après l’exposition de résister, les patrons de nanoscale peuvent être transférées à une variété de cibles matériaux1, permettant ainsi la fabrication de nouveaux dispositifs à résolution nanométrique à un seul chiffre.
Des études antérieures ont montré que la lithographie de faisceau d’électrons (EBL) est capable de définir des modèles à résister à des matériaux dont les dimensions dans la sub-10 nm échelle2,3,4,5,6. Toutefois, pour les dimensions environ 4 nm, ces manifestations ont exigé des procédures non standards tels que l’utilisation d’aider les structures7 ou8résiste à la fois de longue exposition pour se développer. Autres techniques de structuration, tels que le faisceau d’électrons induits par des dépôts9 ou scanning probe Lithographie10,11, ont prouvé capables d’atteindre une résolution sub-4 nm, bien que ceux-ci exigent beaucoup temps d’exposition par rapport à EBL.
Les systèmes modernes d’EBL dédiés produisent des faisceaux d’électrons avec des tailles de spots dans le quelques échelle nanométrique (2-10 nm), qui rend les modèles définition avec résolution sub-10 nm très difficile. En revanche, notre protocole implémente EBL à l’aide d’une tige de correction de l’aberration, qui est un instrument hautement optimisé pour la caractérisation des matériaux à des échelles de longueur angstrom. Cette différence permet de structuration systématique des Records caractéristiques lithographiques avec nanomètre unique résolution1. Tandis que l’état-of-the-art, systèmes commerciaux de souches de correction de l’aberration des coûts de l’ordre de millions de dollars, ils sont disponibles dans plusieurs installations nationales d’utilisateurs, et certains sont accessibles sans frais.
Protocole
1. préparation pour résister à revêtement
Remarque : Dans cet ouvrage, les modèles avec une résolution nanométrique à un seul chiffre sont définis en PMMA (positif et négatif-ton) et HSQ résiste, qui sont des spin-cast sur windows disponibles dans le commerce de TEM (environ 50 µm x 50 µm) avec SiNx ou SiO2 membranes avec des épaisseurs allant de 5 nm à 50 nm. Une ou plusieurs fenêtres TEM sont fabriqués dans un silicium diamètre 3 mm traitement image (100 µm d’épaisseur). Tout au long de ce manuscrit, veuillez consulter la cellule entière dans la puce TEM et la membrane transparente de faisceau d’électrons que la fenêtre TEM.
- Retirer tout résidu organique de la puce TEM en effectuant de plasma de2 O nettoyage pendant 30 s à 100 W (pression de 230 mT environ 5 sccm O2 débit).
- Attacher un morceau de tranche de silicium, environ 2 cm sur 2 cm dans la taille, à utiliser comme support pour la puce TEM pendant resist filature.
- Place deux bandes de ruban de carbone double face environ équidistant du centre de la titulaire de silicium et séparé, un peu moins que le diamètre du TEM chip (voir Figure 1). Rincer les rayures avec l’alcool isopropylique (IPA) pour réduire leur pouvoir adhésif. Cela est nécessaire pour éviter de casser le copeau TEM délicat au moment du retrait du support Si.
- Monter la puce TEM sur le support du silicium en vous assurant qu’il est fixé pour les bandes de ruban de carbone qu’à deux bords opposés, comme illustré à la Figure 1.
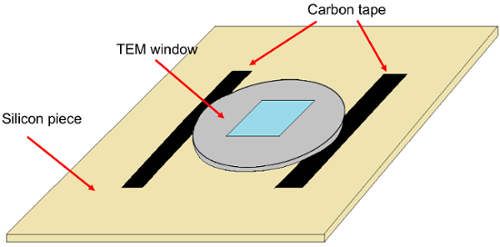
Figure 1 : Support de puce TEM pour résister filature. Notez que la puce TEM est liée à la coupelle de silicium qu’à deux bords pour diminuer le contact de superficie, et par conséquent, forcer l’adhérence. S’il vous plaît cliquez ici pour visionner une version agrandie de cette figure.
2. spin manteau paramètres pour PMMA (ton positif et négatif) et HSQ résiste
Remarque : Resist épaisseur n’est pas mesurée directement sur la puce TEM, car il est petit et habituellement la resist est castée sur l’autres (p. ex., film TR sur SiO2 membrane), des couches minces qui complique la mesure. Au lieu de cela, résister à l’épaisseur est déterminée par la vitesse d’essorage étalonnée à l’aide de mesures de réflectométrie de films monter un gros échantillon Si. Réflectométrie résultats ont été corroborés, généralement avec une précision supérieure à 20 %, par images de haut en bas de tige des structures effondrées.
- Fixer le support de silicium sur le mandrin du fileur et aligner le centre de la fenêtre TEM approximativement avec le centre du rotor spinner.
- À l’aide d’une pipette, couvrir la fenêtre entière de TEM avec une goutte (environ 0,05 mL) de PMMA (A2 950K PMMA dilué dans l’anisole à 0,5-1,0 %) ou HSQ (1 % de solides XR-1541).
- En fonction de la résistance utilisée, suivez le spin coating et cuisson des paramètres indiqués dans le tableau 1.
- Retirer délicatement la puce TEM de la titulaire de silicium. Inspecter l’uniformité de résister sur la fenêtre TEM à l’aide d’un microscope optique. Si le film est homogène dans l’ensemble de la région centrale de la membrane, passez à l’étape suivante ; Sinon, répétez le procédé de revêtement resist sur une nouvelle fenêtre TEM.
| Résister à | Vitesse d’essorage (x g) | Film Épaisseur (nm) | Température de cuisson (° C) | Temps de cuisson (min) |
| Ton positif PMMA | 60 | 30 | 200a | 2une |
| Ton négatif PMMA | 60 | 15 | 200a | 2une |
| HSQ | 107 | 10 | Pas besoin deb | Pas besoin deb |
| aVoir Réf.12 ; bVoir Réf. 13 | ||||
Tableau 1 : résister à spin coating et paramètres de cuisson. Unités de vitesse de rotation en x g envisager une puce TEM de 3 mm de diamètre. Cuisson est réalisée sur une plaque chauffante pour PMMA. Aucune cuisson n’est nécessaire pour HSQ13. Resist HSQ est stocké au réfrigérateur, donc il a besoin pour se réchauffer à température ambiante avant de filer.
3. charger l’échantillon dans la tige, coordonnées de fenêtre de carte et effectuer la mise au point à haute résolution
- Monter la puce TEM resist-enduit sur le porte-échantillon tige, en vous assurant que le faisceau entrant, est confrontée à l’interface resist-vide puisque le faisceau est focalisé optimale dans la partie supérieure de l’échantillon. Aussi, assurez-vous que les côtés de la fenêtre TEM sont alignées approximativement avec la x - et axe y de la scène de la tige. Cela facilitera la navigation vers la fenêtre TEM.
- Charger la puce TEM dans le microscope et la pompe pendant la nuit pour réduire les contaminants dans le compartiment de mesure.
- Déplacez les coordonnées de la scène (x, y) telle que le faisceau soit plus de 100 µm loin du centre de la fenêtre TEM (afin d’éviter toute exposition accidentelle). La valeur du courant de faisceau sonde tige énergie pA 34 et 200 keV, respectivement.
- En mode diffraction d’imagerie (faisceau stationnaire, mode z-contraste et Mid-angle de détecteur de champ sombre annulaire), la valeur grossissement 30 kX avec le faisceau floue, ce qui rend plus facile de trouver un bord de la fenêtre TEM.
Remarque : Les bords de fenêtre TEM peuvent se retrouve en mode d’imagerie. Nous utilisons le mode diffraction parce qu’il est plus rapide, puisque le faisceau ne doit pas être analysé afin de former une image. - Navigation vers la fenêtre TEM jusqu’au bord de la fenêtre est observé sur l’image de diffraction. Naviguer le long des bords de fenêtre et de la notice (x, y) les coordonnées des quatre coins de la fenêtre TEM.
- Dans le dernier virage de la fenêtre, augmentez la grossissement à kX 50 et rugueux en se concentrant sur la membrane de la fenêtre en déplaçant la coordonnée z étape (réglage de la hauteur z) jusqu’au croisement de la diffraction orientation modèle est observée. Par la suite, effectuer une mise au point fine en ajustant l’objectif actuel.
- Augmenter le grossissement à 180 kX. Ajuster la mise au point, réglages de correction stigmation et les aberrations afin d’obtenir une image de diffraction de correction de l’aberration de la membrane de la fenêtre, comme illustré à la Figure 2 b. Cette méthode mise au point est connue comme la méthode de Ronchigram14.

Figure 2 : Image de diffraction de membrane fenêtre TEM. (A) Focused mais image stigmatique. Les paramètres de correction d’aberration de cette image ne sont pas optimales, comme en témoignent les franges de diffraction rapprochées. (B) exposition-prêt non-stigmated image montrant un patron de diffraction plateau lisse. S’il vous plaît cliquez ici pour visionner une version agrandie de cette figure.
4. exposez les motifs à l’aide d’une tige de correction de l’Aberration, équipée d’un système de générateur de Pattern.
Remarque : La tige de correction de l’aberration utilisée dans ce travail est équipée d’un système de générateur de modèle (PGS), qui contrôle la position du faisceau d’électrons pour exposer des modèles définis à l’aide de logiciels de conception (CAO) assistée par ordinateur. Dose est contrôlé en définissant l’espacement entre les points de l’exposition (grandeur de pas) et le temps d’exposition par point. Le tableau 2 résume les paramètres d’exposition utilisés dans le présent protocole. Modèles sont exposés au centre de la fenêtre TEM en mode « continu », puisque les souches utilisées dans ce travail ne comporte pas un faisceau blanker. Avant et après l’exposition, PGS positionne le faisceau à n’importe quel point défini par l’utilisateur dans le champ de vision (FOV), préférence écartées du modèle. Nous utilisons dans le présent protocole les en haut à droite et coins droit inférieur de la FOV comme les positions initiale et finale de faisceau, respectivement.
| Résister à | Exposition de dot | Exposition de ligne | Exposition de la région | ||
| Dose (cf/point) | Taille de palier (nm) | Dose (nC/cm) | Taille de palier (nm) | Dose (µC/cm2) | |
| Ton positif PMMA | 10-100 | 0,5 | 2 – 8 | 0,5 | 2 000 |
| Ton négatif PMMA | 50-500 | 0,5 | 20 à 40 | 0,5 | 50 000-80 000 |
| HSQ | 10-100 | 0,5 | 10 – 20 | 0,5 | 20 000-30 000 |
Tableau 2 : paramètres d’exposition pour le PMMA (ton positif et négatif) et HSQ résiste à. Les valeurs indiquées sont génériques, étant donné que les valeurs de dose optimale dépendant de la conception de modèle spécifique et ciblée des dimensions de la fonction.
- Fermer la vanne de faisceau pour éviter toute exposition accidentelle de le résistent lors du déplacement de la scène. Vérifier que le courant de faisceau est pA 34 et grossissement est 180 kX.
- Utilisez les coordonnées du coin de fenêtre préenregistrés pour déplacer la scène, afin que le centre du champ de vision est 5µm loin du centre de la fenêtre. Ouvrez le robinet-vanne de faisceau et la mise au point à ce stade à l’aide de la méthode Ronchigram décrite à l’étape 3.6.
- Fermer la vanne de faisceau. Déplacer la scène pour mettre le champ de vision au centre de la fenêtre TEM. Modifier le grossissement à kX 18 (correspondant à un µm 5 µm x 5 patterning FOV). Transfert du contrôle de faisceau à PGS et positionner le faisceau n’importe où hors de la zone de modèle (nous utilisons le coin supérieur droit dans le présent protocole).
- Effectuer les actions suivantes en succession rapide pour éviter de surexposer le résister aux positions initiale et finale de faisceau.
- Ouvrez le robinet-vanne et vérifier, en observant l’image de patron de diffraction faisceau, si le faisceau est mise au point à la position du faisceau initial (comme dans la Figure 2 b). Exposer le modèle.
- Lorsque l’exposition est terminée, vérifiez si l’image de patron de diffraction reste dans la mise au point à la position finale de faisceau. Enfin, fermer le robinet-vanne.
- Retirer la puce TEM de la tige.
5. résistez développement et séchage du Point critique
Remarque : Le processus de développement dépend de la résistance utilisée. Étapes, 5.1, 5.2 et 5.3 décrivent le processus de développement pour ton positif PMMA, ton négatif PMMA et HSQ, respectivement. Cependant, tous résiste à part le dernier point de critique même le séchage, qui est nécessaire pour éviter l’effondrement du modèle en raison de la haute-allongement des modèles fabriqués avec ce protocole. Point critique (CPD) de séchage utilise liquide CO2 comme fluide de travail, qui n’est pas miscible avec l’eau. Par conséquent, déshydratation de l’échantillon (étapes de 5,4 à 5,7) nécessitent l’utilisation d’ACS réactif grade d’alcool isopropylique (IPA).
- Développement de ton positif PMMA15: préparer un bécher de 100 mL avec la solution 3:1 de IPA:methyl isobutyl cétone (MIBK). Placer le bécher dans une Bain thermostaté à circulation à 0 ° C (un bain de glace à 0 ° C est une alternative de coût inférieure) et attendez que la température est égalisée. Prenez la puce TEM avec une paire de pincettes et remuer doucement dans la solution froide de 30 s. Procédez avec 5.4 étape.
- Développement du négatif-ton PMMA16: doucement, remuez la puce TEM dans la MIBK à température ambiante (24 ° C) pendant 2 min. transfert l’échantillon à une solution d’acétone et remuer pendant 3 min. procédez à l’étape 5.4.
- Développement de HSQ13: remuer la puce TEM dans une solution d’eau déionisée « salé », contenant 1 % de poids NaOH et 4 % en poids de NaCl pendant 4 min à 24 ° C. Remuer la puce dans l’eau déminéralisée pure pendant 2 min (à rincer le développeur salé). Passez à l’étape 5.4.
- Tremper la puce TEM en qualité de réactif ACS IPA et remuez doucement pendant 30 s.
- Placer rapidement la puce TEM sur la plaquette de Si spécial 2" illustrée à la Figure 3 a. S’assurer que la puce TEM est toujours humide avec IPA pendant le transfert. Après environ 2-3 min, fermer l’assemblage du support plaquette FPC comme illustré à la Figure 3 b. Laissez l’appareil entier trempage en qualité de réactif de ACS IPA pour supplémentaire 15 min totalement immergé dans l’API.
- Rapidement transférer l’assemblage du support de plaquette CPD complet dans un second récipient avec frais réactif ACS IPA et laissez-le pendant 15 min, totalement immergé dans l’API.
- Transférer l’assemblage de support de plaquette CPD à la chambre de traitement instrument CPD (en tout temps que la puce TEM doit être totalement immergée dans l’API). Exécuter le processus de DPC, suivant les instructions d’utilisation de l’instrument.
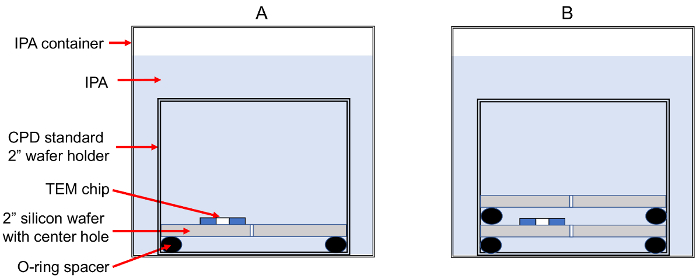
Figure 3 : Solution « maison » pour la déshydratation du TEM puces dans un porte-plaquette CPD standard 2". (A) vue schématique de la puce TEM sur une plaquette de Si spécial 2" avec un petit trou percé dans le Centre (environ 500 μm de diamètre) qui permettent l’écoulement de liquide. La plaquette s’inscrit dans un gaufrette titulaire de norme 2" CPD fourni par le fabricant du système DPC. (B) une deuxième plaquette de Si spéciale enferme la puce TEM, réduisant ainsi l’écoulement turbulent au cours du processus de DPC. En A et B, le titulaire de la CPD wafer est totalement immergé dans la qualité du réactif ACS IPA. S’il vous plaît cliquez ici pour visionner une version agrandie de cette figure.
Résultats
La figure 4 montre les modèles lithographiques sur ton positif PMMA (resist extrait des régions exposées après développement) et ton négatif PMMA (resist retiré de zones non exposées). Windows TEM se composait d’environ 30 resist PMMA épaisseur nm pour ton positif PMMA (15 nm d’épaisseur pour ton négatif PMMA) spin monter une membrane 5 nm dex en péché épaisse. Une fine pellicule métallique (10 nm AuPd plus de 5 nm Ti) a été déposé après le développement de ton positif PMMA pour renforcer le contraste en imagerie de la tige. Pour ton positif PMMA, la moyenne plus petite fonctionnalité isolée est 2,5 ± 0,7 nm (Figure 4, 4D), tandis que le plus petit modèle de terrain est 17.5 nm (Figure 4F). Pour ton négatif PMMA, la moyenne plus petite fonctionnalité isolée est 1,7 ± 0,5 nm (Figure 4), tandis que le plus petit modèle de terrain est 10,7 nm (Figure 4J).

Figure 4 : Lithographie à faisceau d’électrons de correction de l’aberration de positif-négatif-ton et PMMA. (Une fine pellicule de 10 nm AuPd plus de 5 nm Ti a été déposé sur les habitudes PMMA tout ton positif sur cette figure.) (A) image de SEM de modèles arbitraires en PMMA ton positif. (B) les images TEM de modèles arbitraires en PMMA ton négatif. (C, D) Images de SEM des plus petits motifs trous en PMMA ton positif, avec le diamètre moyen de 2,5 ± 0,7 nm. (E, F) Images de SEM de trou tableaux définis sur ton positif PMMA avec une pente de 21,5 nm (E) et 17,5 nm (F). (G, H) Images TEM de tableaux de pilier en PMMA ton négatif avec 20 hauteur nm et diamètre du pilier moyenne de 1,7 ± 0,5 nm (G) et 1,8 ± 0,5 nm (H). (I, J) Images TEM de PMMA ton négatif de la borne tableaux de la hauteur de 15,2 et 10,7 nm, respectivement. Toutes les barres d’échelle sont 40 nm. Ce chiffre a été repris du Manfrinato, V.R., Stein, A., Zhang, L., Nam, C.-Y., Yager, K.G., Stach, E.A et noir, C.T. Aberration-Corrected lithographie à faisceau d’électrons à l’échelle nanométrique un. Nano Lett. 17 (8), 4562-4567 (2017). S’il vous plaît cliquez ici pour visionner une version agrandie de cette figure.
La figure 5 affiche les modèles définis sur resist HSQ. La fenêtre TEM, utilisée pour la lithographie HSQ se composait d’environ 10 nm épais HSQ resist spin monter une membrane Si épaisse de 27 nm. Après développement exposition et résister, 3 à 4 nm de l’ultra-mince couche Si dans les régions exemptes de HSQ (zones non exposées) de la fenêtre ont été enlevées par induction couplé gravure au plasma (ICP) utilisant un mélange de 50 sccm HBr et 20 sccm Cl2 gaz à une pression de 10 mT (biais et puissance de pic de 60 W et 250 W, respectivement). Figure 5 a se compose de quatre rangées de petits traits verticaux. Le haut deux rangées ont été exposées à une dose de ligne renforcé exponentiellement de 2 à 120 nC/cm (largeur de 0 nm conçu pour ces lignes). Les deux lignes inférieures ont été exposés à une dose de zone sortit exponentiellement de 3 000 à 60 000 μC/cm2 (rectangles de large et 200 nm de long conçu de 5 nm). Figure 5 b est une image agrandie de la région Centre de la rangée inférieure dans la Figure 5 a. Les deux plus à gauche, du centre de quatre et les quatre lignes d’extrême droite ont été exposés à une dose de superficie de 23 300, 27 300 et 32 000 μC/cm2, respectivement. Les quatre lignes ont une largeur moyenne mesurée de 7 nm.

Figure 5 : Lithographie par faisceaux d’électrons de correction de l’aberration de résistent HSQ. (La fenêtre TEM utilisée dans cette figure a été faite de 27 nm d’épaisseur Si. Après le développement de HSQ, eau-forte de plasma à couplage inductif servait à évacuer 3 à 4 nm du Si depuis les zones non couvertes par HSQ.) (A) image TEM de quatre rangées de lignes verticales exposés à des doses variant exponentiellement de 2 à 120 nC/cm (lignes de deux albums) et 3 000 à 60 000 μC/cm2 (deux rangées de fond). La taille de palier de faisceau était de 0,5 nm pour toutes les lignes. Image de TEM de fort grossissement (B) de la zone centrale de la rangée inférieure à (A). Le groupe de 4 lignes au Centre ont une moyenne mesurée la largeur de 7 nm et ont été exposés à une dose de zone de 27 300 μC/cm2. S’il vous plaît cliquez ici pour visionner une version agrandie de cette figure.
Discussion
L’étape la plus critique dans le protocole se concentre le faisceau d’électrons avant l’exposition. Ceci est nécessaire pour atteindre la structuration de la plus haute résolution. Lorsque vous effectuez des expositions multiples (par exemple, lorsqu’une puce TEM a plusieurs fenêtres et chacun s’en inspire), il est important de recentrer le faisceau avant chaque exposition à une distance d’au plus 5 μm dans une zone exposée. Le protocole comprend également des mesures pour vérifier la mise au point de la poutre avant et après exposition à deux positions extrêmes de la région de structuration (coins supérieurs et inférieurs), qui permet de déterminer si certains défocalisation a eu lieu au cours de la structuration, par exemple due à un membrane étant inclinée localement dans la région de structuration.
Une autre étape importante dans ce protocole utilise des points critiques (CPD) de séchage pour sécher des échantillons après avoir développé les exposés résister aux patrons. Sans cette étape, les patrons seront effondrera fréquemment en raison du fort allongement des structures à motifs (c.-à-d., à motifs résister dimensions latérales plus petites que l’épaisseur). La plupart des systèmes CPD fournissent un support de plaquette standard 2". Cependant, puisque TEM puces sont très petites et les structures à motifs sont très délicats, ils pourraient être endommagés au cours du processus de DPC lorsqu’il est placé dans les supports conçus pour les plus grands échantillons. La figure 3 illustre une solution interne pour les CPD de TEM puces à l’aide d’un support de plaquette standard. Les deux plaquettes, avec un trou qui permet l’écoulement au centre, placer la puce TEM et protègent contre les turbulences au cours du processus de DPC.
La détermination de l’épaisseur de film de résistance optimale tente d’équilibrer les exigences contradictoires. D’une part, il devrait être aussi mince que possible pour atteindre la plus haute résolution et à éviter l’effondrement du modèle, mais en revanche, il doit être assez épaisse pour les applications de transfert modèle tels que le décollage et la gravure. Ce protocole utilise 1 % HSQ, qui est la dilution la plus faible disponible dans le commerce et dont dilution supplémentaire dans le laboratoire n’est pas recommandée (notre expérience montre que HSQ dilué conduit souvent à une réticulation partielle). Toutefois, étant donné que PMMA dilué donne des résultats reproductibles, ce protocole utilise 1 % pour ton positif PMMA (épaisseur de 30 nm) et 0,5 % et 1 % pour ton négatif (épaisseur de 15 à 30 nm, respectivement). Nous avons trouvé que résister PMMA ton positif ne souffre pas d’effondrement du modèle comme le PMMA ton négatif, donc l’utilisation d’une épaisseur plus mince pour ton négatif comme indiqué dans Table 1. En outre, ton négatif PMMA a perte d’épaisseur environ 50 % après l’exposition e-beam (et avant le développement), donc l’épaisseur finale pour ton négatif PMMA est ~ 7 à 15 nm. (Les caractéristiques de 1,7 à 1,8 nm de Figure 4 ont environ 7 nm resist épaisseur, ce qui est à la limite de l’effondrement du modèle.) Les patrons PMMA, illustrés à la Figure 4 n’a pas utilisé une étape de la DPC ; Toutefois, le cas échéant, ce protocole recommande l’utilisation de CPD après le développement de modèles PMMA. En revanche, nous avons trouvé CPD pour être critique de HSQ traitement dû au fait qu’il ne peut pas être plus dilué (pour obtenir une épaisseur plus mince) et parce que les patrons HSQ plus épais sont nécessaires pour utiliser comme un masque de gravure (par exemple, vers etch silicium, comme illustré à la Figure 5 de ).
Les patrons PMMA ton positif dans la Figure 4 sont recouverts d’une mince pellicule métallique pour augmenter le contraste en imagerie. L’Information à l’appui aux travaux de Manfrinato et al. 1 montre que l’effet de cette couche métallique sur la métrologie des modèles est négligeable. De même, nous considérons que les résultats présentés à la Figure 5 pour résister HSQ ne dépendent pas radicalement le choix particulier de TEM fenêtre structure basée sur l’épaisseur ultra-mince de la couche sous-jacente de la Si.
Au meilleur de notre connaissance, toutes les mesures décrites dans la Section résultats de représentant pour le ton positif et négatif PMMA1 (Figure 4) sont les caractéristiques plus petits rapportés dans la littérature à ce jour1,7 , 12 , 16 , 17. Manfrinato et al. 1 a également démontré des transfert de sup-5 nm de modèle, de la résistance d’un matériau cible, à l’aide de Lift-Off métal conventionnel (pour ton positif PMMA) et infiltration séquentielle synthèse18 de ZnO (pour ton négatif PMMA). Les résultats présentés à la Figure 5 pour HSQ ne sont pas le plus petit des caractéristiques signalées7. Cependant, ce protocole est utile pour l’obtention des caractéristiques reproductibles en HSQ à des résolutions supérieures à 10 nm et montre un chiffre structuration des structures de silicium.
Le protocole présenté ici décrit un processus de structuration des structures arbitraires avec une résolution de nanomètre à un seul chiffre à l’aide du faisceau d’électrons classiques résiste PMMA et HSQ. En outre, les résultats présentés ici et dans 1 Réf. démontrent que de tels motifs peuvent être transférés de haute fidélité à un matériau cible de choix.
Déclarations de divulgation
Les auteurs n’ont rien à divulguer.
Remerciements
Cette recherche utilisé les ressources du Centre pour les nanomatériaux fonctionnels, qui est un bureau US DOE de Science Centre, au Laboratoire National de Brookhaven sous le contrat no. DE-SC0012704.
matériels
| Name | Company | Catalog Number | Comments |
| Plasma asher | Plasma Etch | PE-75 | Located in class 100 cleanroom |
| Silicon Nitride 5 nm thick TEM Windows (9 SMALL Windows) | TEM windows.com | SN100-A05Q33A | |
| TEM chip holder for resist coating | Home made | ||
| 27 nm thick c-Si TEM Windows | TEMwindows.com | Custom order | |
| A2 950K PMMA diluted in anisole to 0.5-1.0% by weight | MicroChem | M230002 | |
| HSQ (1% solids XR-1541) e-beam resist in MIBK | Dow Corning | XR-1541-001 | |
| Spinner | Reynolds Tech | ReynoldsTech Flo-Spin system | Located in class 100 cleanroom |
| Hot plate | Brewer Science | CEE 1300X | Located in class 100 cleanroom |
| Spectral reflectometer | Filmetrics | F20 | Located in class 1000 cleanroom |
| Bath circulator | Thermo Scientific | Neslab RTE 740 | Located in class 100 cleanroom |
| Optical microscope | Nikon | Eclipse L200N | Located in class 1000 cleanroom |
| MIBK/IPA 1:3 developer | MicroChem | M089025 | |
| Sodium hydroxide | Sigma-Aldrich | 221465 | |
| Sodium chloride | Sigma-Aldrich | 31434 | |
| Isopropyl Alcohol, ACS Reagent Grade | Fisher Scientific | MK303202 | |
| TEM chip holder for critical point drying | Home made | ||
| Critical point drying system | Tousimis | Autosamdri-815B, Series C | Located in class 100 cleanroom |
| Aberration-corrected STEM | Hitachi | HD 2700C | |
| Pattern generation system | JC Nabity Lithography Systems | NPGS v9 | |
| Scanning Electron Microscope (SEM) | Hitachi | S-4800 | |
| Reactive ion etcher | Oxford Instruments | Plasmalab 100 | Located in class 1000 cleanroom |
Références
- Manfrinato, V. R., Stein, A., Zhang, L., Nam, C. Y., Yager, K. G., Stach, E. A., Black, C. T. Aberration-Corrected Electron Beam Lithography at the One Nanometer Length Scale. Nano Letters. 17 (8), 4562-4567 (2017).
- Chen, W., Ahmed, H. Fabrication of 5-7 nm wide etched lines in silicon using 100 keV electron-beam lithography and polymethylmethacrylate resist. Applied Physics Letters. 62 (13), 1499-1501 (1993).
- Vieu, C., Carcenac, F., Pepin, A., Chen, Y., Mejias, M., Lebib, A., Manin-Ferlazzo, L., Couraud, L., Launois, H. Electron beam lithography: resolution limits and applications. Applied Surface Science. 164, 111-117 (2000).
- Hu, W., Sarveswaran, K., Lieberman, M., Bernsteina, G. H. Sub-10 nm electron beam lithography using cold development of poly(methylmethacrylate). Journal of Vacuum Science & Technology B. 22 (4), 1711-1716 (2004).
- Chen, Y. Nanofabrication by electron beam lithography and its applications: A review. Microelectronic Engineering. 135, 57-72 (2015).
- Jiang, N. On the spatial resolution limit of direct-write electron beam lithography. Microelectronic Engineering. 168, 41-44 (2017).
- Manfrinato, V. R., Zhang, L., Su, D., Duan, H., Hobbs, R. G., Stach, E. A., Berggren, K. K. Resolution Limits of Electron-Beam Lithography toward the Atomic Scale. Nano Letters. 13 (4), 1555-1558 (2013).
- Isaacson, M., Muray, A. In situ vaporization of very low molecular weight resists using 1/2 nm diameter electron beams. Journal of Vacuum Science & Technology B. 19 (4), 1117-1120 (1981).
- van Dorp, W. F., van Someren, B., Hagen, C. W., Kruit, P. Approaching the Resolution Limit of Nanometer-Scale Electron Beam-Induced Deposition. Nano Letters. 5 (7), 1303-1307 (2005).
- Fuechsle, M., Miwa, J. A., Mahapatra, S., Ryu, H., Lee, S., Warschkow, O., Hollenberg, L. C. L., Klimeck, G., Simmons, M. Y. A single-atom transistor. Nature Nanotechnology. 7 (4), 242-246 (2012).
- Randall, J. N., Lyding, J. W., Schmucker, S., Von Ehr, J. R., Ballard, J., Saini, R., Xu, H., Ding, Y. Atomic precision lithography on Si. Journal of Vacuum Science & Technology B. 27 (6), 2764-2768 (2009).
- Arjmandi, N., Lagae, L., Borghs, G. Enhanced resolution of poly(methyl methacrylate) electron resist by thermal processing. Journal of Vacuum Science & Technology B. 27 (4), 1915-1918 (2009).
- Yang, J. K. W., Berggren, K. K. Using high-contrast salty development of hydrogen silsesquioxane for sub-10-nm half-pitch lithography. Journal of Vacuum Science & Technology B. 25 (6), 2025-2029 (2007).
- Lin, J. A., Cowley, J. M. Calibration of the operating parameters for an HB5 STEM instrument. Ultramicroscopy. 19 (1), 31-42 (1986).
- Cord, B., Lutkenhaus, J., Berggren, K. K. Optimal temperature for development of poly(methylmethacrylate). Journal of Vacuum Science & Technology B. 25 (6), 2013-2016 (2007).
- Duan, H. G., Winston, D., Yang, J. K. W., Cord, B. M., Manfrinato, V. R., Berggren, K. K. Sub-10-nm half-pitch electron-beam lithography by using poly(methyl methacrylate) as a negative resist. Journal of Vacuum Science & Technology B. 28 (6), C6C58-C6C62 (2010).
- Dial, O., Cheng, C. C., Scherer, A. Fabrication of high-density nanostructures by electron beam lithography. Journal of Vacuum Science & Technology B. 16 (6), 3887-3890 (1998).
- Kamcev, J., Germack, D. S., Nykypanchuk, D., Grubbs, R. B., Nam, C. Y., Black, C. T. Chemically Enhancing Block Copolymers for Block-Selective Synthesis of Self-Assembled Metal Oxide Nanostructures. ACS Nano. 7 (1), 339-346 (2013).
Réimpressions et Autorisations
Demande d’autorisation pour utiliser le texte ou les figures de cet article JoVE
Demande d’autorisationThis article has been published
Video Coming Soon