Method Article
자리 나노미터 전자 빔 리소 그래피는 수 차 수정 스캐닝 전송 전자 현미경으로
요약
우리는 두 개의 널리 사용 전자 빔 레지스트에 자리 나노미터의 패턴을 정의 하는 수 차 수정 스캐닝 전송 전자 현미경 사용: 폴 리 (메 틸 메타 크리 레이트)와 수소 silsesquioxane. 저항 패턴 자리 나노미터 충실도 발사, 플라즈마 에칭를 사용 하 여 선택의 대상 재료에 복제 될 수 있습니다 및 저압에 의해 침투를 저항.
초록
전자 빔 리소 그래피를 사용 하 여 기존의 확장 저항과 패턴 전송 프로세스 자리 나노미터 크기를 노출 도구는 수 차 수정 스캐닝 전송 전자 현미경을 사용 하 여 설명 합니다. 여기, 우리는 두 개의 널리 사용 되는 전자 빔 레지스트를 모방 하는 자리 나노미터의 결과 제시: 폴 리 (메 틸 메타 크리 레이트)와 수소 silsesquioxane. 메서드는 폴 리 (메 틸 메타 크리 레이트)의 하위 5 나노미터 기능 및 수소 silsesquioxane에 하위-10 나노미터 분해능을 달성 한다. 대상 재료의 선택으로 이러한 패턴의 고 충실도 전송 금속 이륙을 사용 하 여 수행할 수 있습니다, 그리고 플라즈마 에칭, 저압으로 침투를 저항.
서문
폴 리 (메 틸 메타 크리 레이트) (PMMA) 자리 나노미터 분해능으로 패턴을 정의 하기 위한 지침을 제공 하는이 원고에 제시 하는 프로토콜 및 수소 silsesquioxane (HSQ) 두 가지 일반적인 전자 빔 레지스트를 사용 전자 빔 리소 그래피에 의해 고해상도 패터 닝입니다. 우리는 전자 빔 제어 패턴 발생기와 복 노출 도구로 수 차 수정 스캐닝 전송 전자 현미경 (줄기)를 사용 하 여 이러한 결과 얻을. 레지스트 노출, 나노 스케일 패턴 다양 한 대상 자료1, 자리 나노미터 분해능에서 소설 장치 제작 활성화를 전송할 수 있습니다.
이전 연구는 전자 빔 리소 그래피 (EBL)는 패턴을 정의 저항에 있는 하위 10 nm의 크기와 재료 규모2,,34,,56. 그러나, 차원 4 주위에 대 한 nm,이 논증 요구의 사용과 같은 비표준 절차 지원 구조7 또는8을 저항 하는 자기 개발에 대 한 긴 노출 시간. 다른 nanopatterning 기술, 전자 빔 증 착9 유도 또는 스캐닝 프로브 리소 그래피10,11, 입증 된 하위 4 nm 해상도, 달성 가능한이 크게 필요 EBL에 비해 더 긴 노출 시간입니다.
현대 전용된 EBL 시스템 생성은 몇 나노미터 길이 규모 (2-10 nm), 하위 10 nm 해상도 정의 패턴을 매우 어렵게 만드는 자리 크기와 전자 빔. 반면, 우리의 프로토콜 EBL angstrom 길이 스케일에서 소재 특성에 대 한 최적화 된 악기는 수 차 수정 줄기를 사용 하 여 구현 합니다. 이 차이 단일 나노미터 분해능1기록적인 석판 기능의 일상적인 패턴 수 있습니다. 상태-중--예술, 동안 상업 수 차 수정 줄기 시스템 수백만 달러의 범위에서 그들은 여러 국가 사용자 시설에서 사용 하기 위해 사용할 수 있습니다 비용과 일부 비용 없이 액세스할 수 있습니다.
프로토콜
1. 샘플 준비 저항 코팅
참고:이 작품에서 자리 나노미터 분해능 패턴에에서 정의 된 PMMA (포지티브 및 네거티브-톤)와 HSQ 저항, 스핀-캐스팅은 죄x 또는 SiO2 상업적으로 이용 가능한 가장 windows (약 50 µ m x 50 µ m)에 5에서 다양 한 두께와 막 50 nm nm. 하나 이상의 가장 창 처리 프레임 (두께가 100 µ m) 직경 3 m m 실리콘에서 조작 됩니다. 이 원고를 통해 우리 편 창으로 전자 빔 투명 막에 가장 칩으로 전체 장치를 참조 하십시오.
- O2 플라즈마 30에 대 한 청소를 수행 하 여 가장 칩에서 어떤 유기 잔류물 든 지 제거 s 100 W (약 5 sccm O2 흐름에서 230 mT의 챔버 압력).
- 실리콘 웨이퍼, 약 2 cm x 2 cm 회전 저항 중 가장 칩에 보유자로 사용할 크기의 조각을 쪼개합니다
- 장소 탄소 이중 면 테이프 약 실리콘 홀더의 센터에서 등거리에 있도록 하 고는 가장의 직경 보다 약간 적은 분리의 두 줄무늬 칩 ( 그림 1참조). 이소프로필 알코올 (IPA)을 그들의 접착 강도 줄이기 위해와 줄무늬 린스. 이것은 섬세 한 편 칩 시 홀더에서 제거 하는 동안 위반을 피하기 위해 해야 합니다.
- 그림 1에서 보듯이 그것 두 반대쪽 가장자리에만 탄소 테이프 줄무늬에 연결 되어 있는지 확인 하 고 실리콘 홀더에 가장 칩을 탑재 합니다.
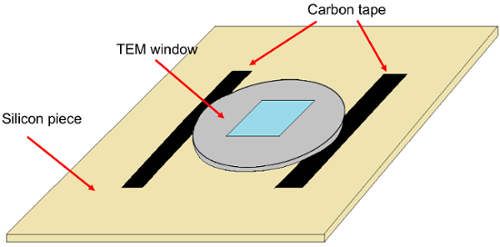
그림 1 : 회전 저항에 대 한 가장 칩 홀더. 가장 칩 표면 접촉을 줄이기 위해 두 개의 모서리에만 실리콘 홀더에 연결 되어 있고 따라서, 접착 힘을 알 수 있습니다. 이 그림의 더 큰 버전을 보려면 여기를 클릭 하십시오.
2. 스핀 코트 매개 변수 HSQ PMMA (포지티브 및 네거티브 톤)에 대 한 저항
참고: 저항 두께 측정 되지 가장 칩에 직접 작은 때문에 일반적으로 저항 캐스팅 (예를 들어, SiO2 막에 시 영화), 다른 얇은 층에는 측정을 복잡 하 게. 대신, 저항 두께 영화에서 셋 측정 시 샘플 대량에 캐스팅 사용 하 여 보정 하는 회전 속도 의해 결정 됩니다. 셋 결과 했다, 일반적으로 20% 이상의 정밀도로 의해 뒷받침 줄기 내려 이미지의 축소 된 구조.
- 실리콘 홀더 회전자 척에 탑재 하 고 회전자로 터의 센터와 약 편 창 중앙 정렬.
- PMMA의 한 방울 (약 0.05 mL)와 전체 편 창 커버를 피 펫을 사용 하 여 (a 950 K PMMA anisole 0.5-1.0에 희석 2%) 또는 HSQ (1% 고체 XR-1541).
- 사용 하는 저항에 따라 스핀 코팅 및 표 1에 표시 된 매개 변수를 베이킹을 따릅니다.
- 조심 스럽게 실리콘 홀더에서 가장 칩을 제거. 광학 현미경을 사용 하 여 가장 창 저항 균일성을 검사 합니다. 영화 인 경우 균질 성 막의 중앙 지역에 걸쳐; 다음 단계로 진행 그렇지 않으면, 신선한 편 창에 저항 코팅 프로세스를 반복 합니다.
| 저항 | 스핀 속도 (g) x | 영화 두께 (nm) | 베이킹 온도 (° C) | 베이킹 시간 (최소) |
| 포지티브-톤 PMMA | 60 | 30 | 200 | 2 |
| 네거티브-톤 PMMA | 60 | 15 | 200 | 2 |
| HSQ | 107 | 10 | 필요 하지b | 필요 하지b |
| 참조 Ref.12; b참고 13 참조 | ||||
표 1: 스핀 코팅 하 고 매개 변수를 굽기 저항. 스핀 속도 단위에서 g x 3 m m 직경 가장 칩을 고려 하십시오. 베이킹 PMMA 뜨거운 접시에 수행 됩니다. 아니 제빵 HSQ13필요 합니다. HSQ 저항 회전 하기 전에 실내 온도를 따뜻하게 해야 하므로 냉장, 저장 됩니다.
3. 줄기에 샘플을 로드, 지도 창 좌표 및 고해상도 집중 수행
- 줄기 샘플 홀더, 저항-진공 인터페이스에 들어오는 광속 얼굴 빔을 최적으로 샘플의 상단에 초점을 맞춘 이후 확인 하에 저항 코팅 가장 칩을 탑재 합니다. 또한, 그 가장 창의 양쪽 정렬 됩니다 약으로 x-축 및 y 축 줄기 무대의 있는지 확인 합니다. 이 가장 창 탐색을 촉진 한다.
- 현미경, 그리고 샘플 실에서 오염 물질을 줄이기 위해 펌프 하룻밤에 가장 칩을 로드 합니다.
- 되도록 빔을 가장 창 ()을 피하기 위해 우연한 노출의 중심에서 100 µ m 단계 (x, y) 좌표를 이동 합니다. 설정 줄기 프로브 빔 전류와 에너지 34 pA 200 keV, 각각.
- (고정 빔, z 대비 모드 및 중간 각도 환상 다크 필드 검출기) 이미징 회절 모드에서 쉽게 가장 창의 가장자리를 찾을 수 있는 초점 빔과 30 kx 확대를 설정 합니다.
참고: 가장 창 가장자리 또한 이미징 모드에서 찾을 수 있습니다. 우리는 빔 여 이미지 스캔 필요 하지 않기 때문 더 빨리, 때문에 회절 모드를 사용 합니다. - 윈도우의 가장자리 회절 이미지에 관찰 될 때까지 가장 창으로 이동 합니다. 기록 창 가장자리를 따라 이동 (x, y) 좌표 가장 윈도우의 네 모퉁이의.
- 마지막 창 코너에서 증가 50 kX 확대 하 고 거친 집중 수행 단계 z 좌표 (z 높이 조정)는 회절의 크로스 오버까지 이동 하 여 창 막에 패턴 방향을 관찰. 그 후, 현재 목표 렌즈를 조정 하 여 초점을 잘 수행 합니다.
- 180 kx 확대 증가. 조정 초점, 그림 2B와 같이 창 막의 수 차 수정 회절 이미지를 얻으려면 stigmation 및 수 차 보정 설정. 이 초점 방법은 Ronchigram 방법14로 알려져 있다.

그림 2 : 편 창 막의 회절 이미지. (A) 집중 하지만 stigmatic 이미지. 이 이미지에 대 한 수 차 보정 설정이 최적의 긴밀 한-간격 회절 변두리에 의해 입증 하지 않습니다. (B) 노출 준비 비 stigmated 이미지 부드러운 고원 회절 패턴을 보여주는. 이 그림의 더 큰 버전을 보려면 여기를 클릭 하십시오.
4. 패턴 발생기 시스템은 수 차 수정 줄기를 사용 하 여 패턴을 노출 합니다.
참고:이 작업에 사용 되는 수 차 수정 줄기 컴퓨터 원조 설계 (CAD) 소프트웨어를 사용 하 여 정의 하는 패턴을 노출 하는 전자 빔 위치 제어 패턴 생성기 시스템 (PGS)을 갖추고 있다. 복용량 노출 포인트 (단계 크기)와 포인트 당 노출 시간 사이의 간격을 정의 하 여 제어 됩니다. 표 2 에이 프로토콜에 사용 되는 노출 매개 변수 요약 되어 있습니다. 패턴 "연속 모드," 가장 창 중앙에 노출 되는 때문에이 작품에 사용 된 줄기 빔 blanker를 포함 하지 않습니다. 노출 전후 PGS 위치 언제 든 지 사용자 정의 시야 (FOV)에 빔 선호 패턴 영역에서. 우리이 프로토콜에서 오른쪽 상단 및 하단 오른쪽 모서리 FOV의 초기 및 최종 빔 위치도 각각 사용합니다.
| 저항 | 점 노출 | 선 노출 | 영역 노출 | ||
| 복용량 (fC/점) | 단계 크기 (nm) | 복용량 (노스캐롤라이나/cm) | 단계 크기 (nm) | 복용량 (µ C/c m2) | |
| 긍정적인 톤 PMMA | 10-100 | 0.5 | 2-8 | 0.5 | 2000 |
| 네거티브 톤 PMMA | 50-500 | 0.5 | 20-40 | 0.5 | 50000-80000 |
| HSQ | 10-100 | 0.5 | 10-20 | 0.5 | 20000-30000 |
표 2: PMMA (포지티브 및 네거티브 톤) 및 HSQ 노출 매개 변수 저항. 표시 된 값은 최적의 복용량 값 특정 패턴 디자인에 따라 달라 집니다 이후 피쳐 치수를 대상으로 일반.
- 무대를 이동할 때 저항 하는의 어떤 우발적인 노출을 피하기 위해 빔 게이트 밸브를 닫습니다. 빔 전류는 34 pA 확대는 180 kX 확인 합니다.
- 사용 하 여 미리 녹음 된 창 모서리 좌표 이동 무대, FOV 센터는 윈도우의 중심에서 5 µ m. 빔 게이트 밸브와이 시점에서 단계 3.6에서 설명 하는 Ronchigram 메서드를 사용 하 여 초점을 엽니다.
- 빔 게이트 밸브를 닫습니다. 가장 창 중앙에서 FOV를 무대를 이동 합니다. 확대 18 kX (FOV를 패턴화 5 µ m x 5 µ m에 해당)를 변경 합니다. PGS 빔 제어 전송 하 고 (우리를 사용 하 여 오른쪽 상단 모서리가 프로토콜에서) 패턴 지역에서 광선을 원하는 위치.
- 피하기 위해 초기 및 최종 빔 위치에 저항을 overexposing 빠른 승계에서 다음 작업을 수행 합니다.
- 게이트 밸브를 열고 ( 그림 2B)에서 초기 광속 위치에서 초점에 광선 인지 빔 회절 패턴 이미지를 관찰 하 여 확인 합니다. 패턴을 노출 합니다.
- 노출이 완료 되 면 회절 패턴 이미지 최종 빔 위치에 초점에 남아 확인 합니다. 마지막으로, 게이트 밸브를 닫습니다.
- 줄기에서 가장 칩을 제거 합니다.
5. 저항 개발 및 한계점 건조
참고: 개발 프로세스 사용 하는 저항에 따라 달라 집니다. 5.1, 5.2, 5.3 단계 각각 포지티브-톤 PMMA, 네거티브-톤, PMMA 및 HSQ, 개발 프로세스를 설명합니다. 그러나, 모든 공유 같은 최종 한계점 건조 과정은이 프로토콜을 조작 하는 패턴의 높은 종횡비 때문 패턴 붕괴를 방지 하는 데 필요한 저항. (일일)을 건조 하는 중요 한 포인트는 물과 혼합할 수 있는 작동 유체로 액체 CO2 를 사용 합니다. 따라서, 샘플 탈수 (단계 5.4 5.7) ACS 시 약 학년 이소프로필 알코올 (IPA) 사용을 해야 합니다.
- 포지티브-톤 PMMA15의 개발: IPA:methyl isobutyl-케 톤 (MIBK)의 3:1 솔루션 100 mL 비 커를 준비. 0 ° C (0 ° C에서 얼음 목욕 낮은 비용 대안 이다)에서 목욕 circulator에 비 커를 놓고 온도 평준화 될 때까지 기다립니다. 한 쌍의 족집게와 가장 칩을 부드럽게 저 어 차가운 솔루션에서 단계 5.4와 30 미 진행에 대 한.
- 네거티브-톤 PMMA16의 개발: 부드럽게 2 분 전송 샘플을 아세톤 솔루션에 대 한 실 온 (24 ° C)에서 MIBK에서 가장 칩을 저 어 하 고 3 분 진행 단계 5.4에 대 한 저 어.
- HSQ13의 개발: 1 wt %NaOH 24 ° c.에서 4 분 4 wt %NaCl를 포함 하는 "짠" 이온된 수 솔루션에서 가장 칩을 저 어 2 분 (짠 개발자 씻어) 순수 이온된 수에 칩을 저 어. 5.4 단계로 진행 합니다.
- ACS 시 약 학년 IPA 가장 칩을 찍어와 부드럽게 저 어 30 s.
- 신속 하 게 특별 한 2"Si 웨이퍼 그림 3A에서 표시에 가장 칩을 놓습니다. 가장 칩은 전송 하는 동안 IPA와 젖은 항상 다는 것을 확인 하십시오. 약 2-3 분 후 그림 3B에서 같이 일일 웨이퍼 홀더 어셈블리를 닫습니다. 추가 15 분 IPA에 완전히 몰입에 대 한 ACS 시 약 등급 IPA에에서 몸을 담글 전체 장치를 둡니다.
- 빨리 신선한 ACS 시 약 학년 IPA와 두 번째 컨테이너 전체 일일 웨이퍼 홀더 어셈블리를 전송 하 고 IPA에 완전히 몰입 하는 15 분 동안 그것을 둡니다.
- (언제 든 가장 칩 IPA에 완전히 몰입 해야) 일일 악기 프로세스 챔버를 일일 웨이퍼 홀더 어셈블리를 전송. 악기의 운영 지침에 따라 일일 프로세스를 실행 합니다.
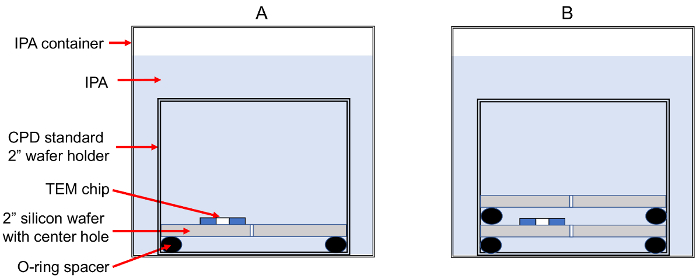
그림 3 : 가장의 탈수에 대 한 사내 솔루션 칩에 일일 표준 2"웨이퍼 홀더. (A) 액체 흐름을 허용 하도록 센터 (직경에서 약 500 μ m)에서 교 련된 작은 구멍을 가진 특별 한 2"Si 웨이퍼에 가장 칩의 회로도 측면 보기. 웨이퍼는 일일 표준 2"웨이퍼 홀더 일일 시스템 제조업체에 의해 제공에 맞는. (B) 두 번째 특별 한 Si 웨이퍼는 가장 칩, 난 류 흐름 과정에서 일일 비용 감소를 포함 합니다. A와 B, 일일 웨이퍼 홀더는 ACS 시 약 학년 IPA에에서 완전히 몰입. 이 그림의 더 큰 버전을 보려면 여기를 클릭 하십시오.
결과
그림 4 는 포지티브-톤 PMMA (레지스트 노출된 지역에서 개발 후 제거) 및 네거티브-톤 PMMA (레지스트 노출 되지 않은 영역에서 제거) 리소 그래피 패턴을 보여준다. 포지티브-톤 PMMA에 대 한 약 30 nm 두께 PMMA 저항 이루어져 가장 윈도 (15 nm 두꺼운 네거티브-톤 PMMA에 대 한) 5 nm 두께 죄x 막에 스핀. 금속 박막 (10 nm AuPd 이상 5 nm Ti) 줄기 이미징 동안 대비를 향상을 포지티브-톤 PMMA의 개발 후 예금 되었다. 포지티브-톤 PMMA에 대 한 평균 작은 고립 된 특징은 2.5 ± 0.7 nm (그림 4C, 4d), 작은 피치 패턴은 17.5 nm (그림 4 층). 네거티브-톤 PMMA에 대 한 평균 작은 고립 된 특징은 1.7 ± 0.5 nm (그림 4G), 작은 피치 패턴은 10.7 동안 nm (그림 4J).

그림 4 : 수 차 수정 전자 빔 리소 그래피의 포지티브 및 네거티브-톤 PMMA. (박막 10 nm AuPd 이상 5 nm Ti이이 그림에 표시 된 모든 포지티브-톤 PMMA 패턴에 예금 되었다.) (A) 포지티브-톤 PMMA에 임의의 패턴의 SEM 이미지. (B) 네거티브-톤 PMMA에 임의의 패턴의 TEM 이미지. (C, D) SEM 이미지의 작은 평균 2.5 ± 0.7 nm의 직경으로 포지티브-톤 PMMA에 구멍 패턴. (E, F) 포지티브-톤 PMMA 21.5의 피치에 정의 된 구멍 배열의 SEM 이미지 (E) 및 17.5 nm (F). (G, H) 네거티브-톤 PMMA 1.8 ± 0.5 nm (H)와 1.7 ± 0.5 nm (G)의 평균 기둥 직경 20 nm 피치와 기둥 배열의 TEM 이미지. (I, J) 네거티브-톤 PMMA의 TEM 이미지 각각 15.2 고 10.7 nm 피치의 기둥. 모든 스케일 바는 40 nm. 이 그림에서 Manfrinato, V.R. 스타인, 재현 되었습니다 대답, 장, L., 남, C. Y., 거, K.G., Stach, ⑤, 및 검정, 1 나노미터의 길이 규모에 코네티컷 Aberration-Corrected 전자 빔 리소 그래피. 나노 Lett. 17 (8), 4562-4567 (2017). 이 그림의 더 큰 버전을 보려면 여기를 클릭 하십시오.
그림 5 HSQ 저항에 정의 된 패턴을 표시 합니다. 대략 10 nm 두께 HSQ 저항 스핀 27 nm 두께 시 막에 HSQ 리소 그래피에 사용 되는 가장 창에 의하여 이루어져 있다. 노출 및 저항 개발, 3-4 nm 울트라 얇은 시 레이어 창 HSQ 무료 지역 (노출 되지 않은 영역)에서 유도 의해 제거 된 후 결합 플라즈마 (ICP) 에칭의 챔버 압력에서 50 sccm HBr과 20 sccm Cl2 가스의 혼합물을 사용 하 여 10 mT (바이어스 및 ICP 전력 60 W와 250 W, 각각). 그림 5A 는 짧은 수직 라인의 4 행으로 구성 됩니다. 위 두 행 선 복용량 노출 된 nC/120cm (0 nm 설계 폭이이 라인에 대 한)에 2에서 기 하 급수적으로 물러났다. 낮은 두 개의 행은 기 하 급수적으로 3, 000에서 60000 μC/cm2 (5 nm 폭 및 200 nm 오랫동안 설계 사각형) 강화 지역 복용량 노출 되었다. 그림 5B 는 그림 5A에서 맨 아래 행의 중부의 확대 된 이미지입니다. 2 왼쪽, 4 개의 센터 및 4 개의 오른쪽 라인 각각 23,300, 27,300, 및 32000 μC/c m2의 지역 복용량 노출 되었다. 4 센터 라인은 7의 평균 측정된 폭 nm.

그림 5 : 수 차 수정 전자 빔 리소 그래피 HSQ 저항의. (이 그림에 사용 된 가장 창 27 nm 두께 시의 되었다. HSQ 개발 후 유도 결합된 플라즈마 에칭은을 사용 시의 3-4 nm HSQ 적용 되지 않는 지역에서.) (A) 수직 라인의 4 행의 TEM 이미지 120 nC/cm (상위 2 개의 행)과 3, 000에서 60000 μC/cm2 (하단 2 개의 행) 2에서 기 하 급수적으로 변화 하는 복용량과 노출. 빔 단계 크기는 0.5 nm 모든 라인에 대 한. (A)에서 맨 아래 행의 중앙 지역의 (B) 고배율 TEM 이미지. 중앙에 4 라인의 그룹 있다 평균 7의 폭을 측정 nm 27300 μC/c m2의 지역 복용량 노출 했다. 이 그림의 더 큰 버전을 보려면 여기를 클릭 하십시오.
토론
프로토콜의 가장 중요 한 단계 노출 전에 전자 빔에 초점을 맞추고입니다. 이것은 모방 하는 높은 해상도 달성 하는 데 필요한입니다. 다중 노출 (예:, 가장 칩은 여러 개의 창을 각각 패턴화 되는 때)를 수행할 때 노출 영역에서 대부분에 5 μ m의 거리에서 각 노출 전에 빔 촛점을 중요 하다. 프로토콜 또한 전과 여부 일부 defocusing 동안 발생 패턴, 예 때문에 결심을 허용 하는 패턴 영역 (위쪽 및 아래쪽 모서리)의 두 극단적인 위치에 노출 후 광선 초점을 확인 하는 단계를 포함 한 막 패터 닝 지역에 로컬 기울이면 되 고입니다.
이 프로토콜에서 다른 중요 한 단계 건조 (일일)을 건조 하는 중요 한 포인트를 사용 하는 노출 개발 후 샘플 저항 패턴. 이 단계 없이 패턴 패턴된 구조 (즉, 꽃무늬 저항 측면 차원 두께 보다 작은)의 높은 종횡비 때문 자주 붕괴 됩니다. 대부분의 일일 비용 시스템 표준 2"웨이퍼 홀더를 제공합니다. 그러나, 가장 칩은 매우 작은 있기 때문에 패턴화 된 구조는 매우 섬세 하 고, 그들은 더 큰 견본을 위한 홀더에 배치 될 경우 일일 과정 손상 될 수 있습니다. 그림 3 일일의 가장 칩 표준 웨이퍼 홀더를 사용 하 여 사내 솔루션을 보여 줍니다. 센터에서 흐름 수 있도록 구멍 두 웨이퍼 가장 칩을 포함 하 고 일일 과정에서 난 류 흐름에서 그것을 보호.
최적의 레지스트 막 두께의 결정 경쟁 요구를 균형을 시도 합니다. 한편으로, 그것은 가능한 가장 높은 해상도 달성 하 고 패턴 붕괴를 피하기 위해 얇은 있어야 하지만 다른 한편으로, 그것은 이륙 및 에칭 등 패턴 전송 응용 프로그램에 대 한 충분히 두꺼운 되어야 합니다. 이 프로토콜 사용 하 여 1 %HSQ, 상업적으로 이용 가능한 가장 낮은 희석 그리고 실험실에서 그 더 희석 (희석된 HSQ 종종 부분 가교를 이끌어 우리의 경험 쇼)을 권장 하지 않습니다. 그러나, 때문에 희석된 PMMA 재현성 결과 주지 않습니다,이 프로토콜 사용 하 여 1% 포지티브-톤 PMMA에 대 한 (30 nm 두께) 및 0.5%와 1% 네거티브 톤에 대 한 (15와 30 nm 두께, 각각). 우리는 마찬가지로 네거티브-톤 PMMA, 따라서 부정적인 톤에 대 한 얇은 두께 사용 하 여에서와 같이 그 포지티브-톤 PMMA 레지스트 패턴 붕괴에서 고통을 하지 않습니다 발견 표 1. 또한, 네거티브-톤 PMMA는 ~ 50% 두께 손실 전자 광속 노출 후 (개발 하기 전에), 그래서 네거티브-톤 PMMA에 대 한 최종 두께 7 ~ 15 nm. ( 그림 4 에서 1.7과 1.8 nm 기능 약 7 nm 저항 두께를, 패턴의 한계에 있다.) 그림 4 에 표시 된 PMMA 패턴 일일 단계;를 사용 하지 않았다 그러나, 가능한 경우,이 프로토콜 PMMA 패턴의 개발 후 일일 비용의 사용을 권장 합니다. 반면, 우리 HSQ 처리 (얇은 두께 달성)을 더 희석 수 없다는 사실 때문에 및 두꺼운 HSQ 패턴 (예를 들어, 그림 5와 같이 실리콘 에칭을 에칭 마스크로 사용 하는 데 필요한 때문에 중요 한 일일 발견 ).
그림 4 의 포지티브-톤 PMMA 패턴 이미징 동안 대비를 증가 하기 위하여 금속 박막으로 코팅 했다. Manfrinato 외의 작품에서 지원 정보. 1 패턴의 계측에이 금속 코팅의 효과 무시할 수 보여 줍니다. 마찬가지로, 우리 HSQ 저항을 위해 그림 5 에 표시 된 결과 기본 Si 계층의 초박형 두께에 따라 가장 창 구조에 대 한 특정 선택에 크게 의존 하지 않는 것이 좋습니다.
우리의 지식 최선을 포지티브 및 네거티브 톤 PMMA1 (그림 4)에 대 한 대표적인 결과 섹션에 설명 된 모든 측정 하는 날짜1,7 문학에서 보고 된 작은 기능 , 12 , 16 , 17. Manfrinato 외. 1 도 (포지티브-톤 PMMA)에 대 한 기존의 금속 이륙 (네거티브-톤 PMMA)에 대 한 ZnO의 순차적 침투 합성18 를 사용 하 여 대상 물질에 저항에서 하위 5 nm 패턴 전송 시연. HSQ 위해 그림 5 에 표시 된 결과 보고 기능 작은7되지 않습니다. 그러나,이 프로토콜은 10 보다는 더 나은 해상도 HSQ의 재현 기능을 얻는 데 유용 nm, 그리고 실리콘 구조를 모방 하는 자리를 보여줍니다.
여기에 제시 된 프로토콜 한 자리 나노미터 분해능 PMMA와 HSQ 기존의 전자 빔 레지스트를 사용 하 여 임의 구조 패턴에 대 한 프로세스를 설명 합니다. 또한, 여기 고 참고 1에 표시 된 결과 이러한 패턴 선택의 대상 물질에 높은 충실도로 전송할 수 있습니다 보여 줍니다.
공개
저자는 공개 없다.
감사의 말
이 연구는 미국 DOE 사무실의 과학 시설 인, 계약 번호 아래 Brookhaven 국립 연구소에 기능성 나노 소재에 대 한 센터의 자원 사용 드-SC0012704입니다.
자료
| Name | Company | Catalog Number | Comments |
| Plasma asher | Plasma Etch | PE-75 | Located in class 100 cleanroom |
| Silicon Nitride 5 nm thick TEM Windows (9 SMALL Windows) | TEM windows.com | SN100-A05Q33A | |
| TEM chip holder for resist coating | Home made | ||
| 27 nm thick c-Si TEM Windows | TEMwindows.com | Custom order | |
| A2 950K PMMA diluted in anisole to 0.5-1.0% by weight | MicroChem | M230002 | |
| HSQ (1% solids XR-1541) e-beam resist in MIBK | Dow Corning | XR-1541-001 | |
| Spinner | Reynolds Tech | ReynoldsTech Flo-Spin system | Located in class 100 cleanroom |
| Hot plate | Brewer Science | CEE 1300X | Located in class 100 cleanroom |
| Spectral reflectometer | Filmetrics | F20 | Located in class 1000 cleanroom |
| Bath circulator | Thermo Scientific | Neslab RTE 740 | Located in class 100 cleanroom |
| Optical microscope | Nikon | Eclipse L200N | Located in class 1000 cleanroom |
| MIBK/IPA 1:3 developer | MicroChem | M089025 | |
| Sodium hydroxide | Sigma-Aldrich | 221465 | |
| Sodium chloride | Sigma-Aldrich | 31434 | |
| Isopropyl Alcohol, ACS Reagent Grade | Fisher Scientific | MK303202 | |
| TEM chip holder for critical point drying | Home made | ||
| Critical point drying system | Tousimis | Autosamdri-815B, Series C | Located in class 100 cleanroom |
| Aberration-corrected STEM | Hitachi | HD 2700C | |
| Pattern generation system | JC Nabity Lithography Systems | NPGS v9 | |
| Scanning Electron Microscope (SEM) | Hitachi | S-4800 | |
| Reactive ion etcher | Oxford Instruments | Plasmalab 100 | Located in class 1000 cleanroom |
참고문헌
- Manfrinato, V. R., Stein, A., Zhang, L., Nam, C. Y., Yager, K. G., Stach, E. A., Black, C. T. Aberration-Corrected Electron Beam Lithography at the One Nanometer Length Scale. Nano Letters. 17 (8), 4562-4567 (2017).
- Chen, W., Ahmed, H. Fabrication of 5-7 nm wide etched lines in silicon using 100 keV electron-beam lithography and polymethylmethacrylate resist. Applied Physics Letters. 62 (13), 1499-1501 (1993).
- Vieu, C., Carcenac, F., Pepin, A., Chen, Y., Mejias, M., Lebib, A., Manin-Ferlazzo, L., Couraud, L., Launois, H. Electron beam lithography: resolution limits and applications. Applied Surface Science. 164, 111-117 (2000).
- Hu, W., Sarveswaran, K., Lieberman, M., Bernsteina, G. H. Sub-10 nm electron beam lithography using cold development of poly(methylmethacrylate). Journal of Vacuum Science & Technology B. 22 (4), 1711-1716 (2004).
- Chen, Y. Nanofabrication by electron beam lithography and its applications: A review. Microelectronic Engineering. 135, 57-72 (2015).
- Jiang, N. On the spatial resolution limit of direct-write electron beam lithography. Microelectronic Engineering. 168, 41-44 (2017).
- Manfrinato, V. R., Zhang, L., Su, D., Duan, H., Hobbs, R. G., Stach, E. A., Berggren, K. K. Resolution Limits of Electron-Beam Lithography toward the Atomic Scale. Nano Letters. 13 (4), 1555-1558 (2013).
- Isaacson, M., Muray, A. In situ vaporization of very low molecular weight resists using 1/2 nm diameter electron beams. Journal of Vacuum Science & Technology B. 19 (4), 1117-1120 (1981).
- van Dorp, W. F., van Someren, B., Hagen, C. W., Kruit, P. Approaching the Resolution Limit of Nanometer-Scale Electron Beam-Induced Deposition. Nano Letters. 5 (7), 1303-1307 (2005).
- Fuechsle, M., Miwa, J. A., Mahapatra, S., Ryu, H., Lee, S., Warschkow, O., Hollenberg, L. C. L., Klimeck, G., Simmons, M. Y. A single-atom transistor. Nature Nanotechnology. 7 (4), 242-246 (2012).
- Randall, J. N., Lyding, J. W., Schmucker, S., Von Ehr, J. R., Ballard, J., Saini, R., Xu, H., Ding, Y. Atomic precision lithography on Si. Journal of Vacuum Science & Technology B. 27 (6), 2764-2768 (2009).
- Arjmandi, N., Lagae, L., Borghs, G. Enhanced resolution of poly(methyl methacrylate) electron resist by thermal processing. Journal of Vacuum Science & Technology B. 27 (4), 1915-1918 (2009).
- Yang, J. K. W., Berggren, K. K. Using high-contrast salty development of hydrogen silsesquioxane for sub-10-nm half-pitch lithography. Journal of Vacuum Science & Technology B. 25 (6), 2025-2029 (2007).
- Lin, J. A., Cowley, J. M. Calibration of the operating parameters for an HB5 STEM instrument. Ultramicroscopy. 19 (1), 31-42 (1986).
- Cord, B., Lutkenhaus, J., Berggren, K. K. Optimal temperature for development of poly(methylmethacrylate). Journal of Vacuum Science & Technology B. 25 (6), 2013-2016 (2007).
- Duan, H. G., Winston, D., Yang, J. K. W., Cord, B. M., Manfrinato, V. R., Berggren, K. K. Sub-10-nm half-pitch electron-beam lithography by using poly(methyl methacrylate) as a negative resist. Journal of Vacuum Science & Technology B. 28 (6), C6C58-C6C62 (2010).
- Dial, O., Cheng, C. C., Scherer, A. Fabrication of high-density nanostructures by electron beam lithography. Journal of Vacuum Science & Technology B. 16 (6), 3887-3890 (1998).
- Kamcev, J., Germack, D. S., Nykypanchuk, D., Grubbs, R. B., Nam, C. Y., Black, C. T. Chemically Enhancing Block Copolymers for Block-Selective Synthesis of Self-Assembled Metal Oxide Nanostructures. ACS Nano. 7 (1), 339-346 (2013).
재인쇄 및 허가
JoVE'article의 텍스트 или 그림을 다시 사용하시려면 허가 살펴보기
허가 살펴보기더 많은 기사 탐색
This article has been published
Video Coming Soon
Copyright © 2025 MyJoVE Corporation. 판권 소유