Method Article
Litografia de feixe de elétrons do nanômetro do dígito com uma aberração corrigida digitalização microscópio eletrônico de transmissão
Neste Artigo
Resumo
Nós usamos um aberração corrigida digitalização microscópio eletrônico de transmissão para definir padrões de dígito nanômetros em dois feixes de electrões utilizado resiste: poli (metacrilato de metilo) e silsesquioxane de hidrogênio. Resistir a padrões podem ser replicados em materiais de alvo de escolha com fidelidade dígito nanômetros usando plasma gravura, a decolagem e resistir a infiltração por organometálicos.
Resumo
Vamos demonstrar a extensão de feixe de elétrons litografia usando convencional resiste e transferência padrão processa para dígito nanômetros dimensões empregando um aberração corrigida digitalização microscópio eletrônico de transmissão como a ferramenta de exposição. Aqui, apresentamos resultados de padronização de dígito nanômetros de dois feixes de electrões amplamente utilizado resiste: poli (metacrilato de metilo) e silsesquioxane de hidrogênio. O método consegue recursos sub-5 nanômetros em poli (metacrilato de metilo) e sub-10 nanômetros de resolução em silsesquioxane de hidrogênio. Transferência de alta-fidelidade desses padrões em materiais de alvo de escolha pode ser realizada usando metal decolagem, plasma etch e resistir a infiltração com organometálicos.
Introdução
O protocolo apresentado neste manuscrito fornece orientações para a definição de padrões com resolução de dígito nanômetros em poli (metacrilato de metila) (PMMA) e hidrogênio silsesquioxane (HSQ), que são dois resiste de feixe de elétrons comuns usados em Modelação de alta resolução por litografia de feixe de elétrons. Podemos obter esses resultados usando um aberração corrigida digitalização microscópio eletrônico de transmissão (STEM) como a ferramenta de exposição, equipada com um gerador de padrão para controlar o feixe de elétrons. Após a exposição de resistir, os padrões de escala nanométrica podem ser transferidos para uma variedade de alvo materiais1, permitindo assim a fabricação de novos dispositivos na resolução de dígito nanômetros.
Estudos anteriores mostraram que a litografia de feixe de elétrons (EBL) é capaz de definir padrões em resist materiais com dimensões em nm a sub-10 escala2,3,4,5,6. No entanto, para dimensões em torno de 4 nm, essas manifestações têm exigido procedimentos padronizados, tais como uso de ajudam estruturas7 ou tempos de longa exposição para auto-desenvolvimento resiste8. Outras técnicas de nanopatterning, tais como o feixe de elétrons induzida por deposição9 ou digitalização sonda litografia10,11, provaram ser capazes de atingir resolução sub-4 nm, embora estes requerem significativamente tempos de exposição mais comparados a EBL.
Modernos sistemas dedicados de EBL produzem feixes de elétrons com tamanhos especiais em alguns nanômetros comprimento escala (2-10 nm), que dificulta a definição de padrões com resolução de sub-10 nm. Em contraste, o nosso protocolo implementa EBL usando uma haste de correção de aberração, que é um instrumento altamente otimizado para caracterização de materiais em escalas de comprimento angstrom. Esta diferença permite rotina padronização das características litográficas recorde com único nanômetros resolução1. Enquanto Estado-of-the-art, sistemas de haste de correção de aberração comerciais custaram na faixa de milhões de dólares, eles estão disponíveis para uso em várias instalações do usuário nacional e alguns são acessíveis sem custo.
Protocolo
1. amostra preparação para resistir o revestimento
Nota: Neste trabalho, os padrões com resolução de dígito nanômetros são definidos em PMMA (positivo e negativo-Tom) e HSQ resiste, que são spin-cast para comercialmente disponíveis windows TEM (aproximadamente 50 µm x 50 µm) com pecadox ou SiO2 membranas com espessuras que variam de 5 nm a 50 nm. Um ou mais janelas TEM são fabricadas em um silicone de 3 mm de diâmetro manipulação quadro (100 µm de espessura). Em todo este manuscrito, referimo-na toda a unidade como o chip TEM e à membrana transparente do feixe de elétrons como a janela TEM.
- Retire o chip TEM qualquer resíduo orgânico, através da realização de plasma de2 O limpeza por 30 s a 100 W (pressão da câmara de 230 mT em aproximadamente 5 sccm O2 fluxo).
- Decompor um pedaço de bolacha de silicone, aproximadamente 2 cm x 2 cm de tamanho, para usar como um suporte para o chip TEM durante resistir girando.
- Lugar de duas faixas de fita dupla-face de carbono aproximadamente equidistante do centro do titular do silício e separada ligeiramente menos do que o diâmetro da TEM chip (ver Figura 1). Enxague as listras com álcool isopropílico (IPA) para reduzir a resistência adesiva. Isso é necessário para evitar quebrar o chip TEM delicado durante a remoção do suporte para Si.
- Instale o chip TEM o titular de silício, certificando-se que é anexado para as faixas de fita de carbono somente em duas bordas opostas como mostrado na Figura 1.
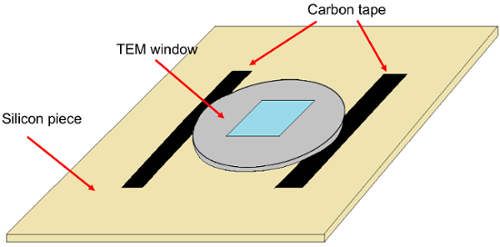
Figura 1 : Titular do chip TEM para resistir girando. Observe que o chip TEM é anexado ao titular do silício apenas em duas bordas, para diminuir o contato da área de superfície, e, portanto, forçar a adesão. Clique aqui para ver uma versão maior desta figura.
2. spin Coat parâmetros para PMMA (Tom positivo e negativo) e HSQ resiste
Nota: Espessura de resistir não é medida diretamente no chip TEM, desde que é pequeno e normalmente a resistir é convertida em outras camadas finas (por exemplo, filme de Si na membrana de SiO2 ), que dificulta a medição. Em vez disso, resistir a espessura é determinada pela velocidade de centrifugação calibrada usando medições reflectometria de filmes lançar sobre um volume de amostra de Si. Reflectometria resultados foram corroborados, geralmente com uma precisão melhor do que 20%, por imagens de cima para baixo tronco de estruturas em colapso.
- Monte o suporte de silício em chuck o girador e alinhar o centro da janela TEM aproximadamente com o centro do rotor do girador.
- Utilizando uma pipeta, cobrir a janela inteira TEM com uma gota (cerca de 0,05 mL) de PMMA (A2 950K PMMA diluída em anisol a 0,5-1,0%) ou HSQ (1% de sólidos XR-1541).
- Dependendo a resistir usado, siga o spin do revestimento e cozimento parâmetros mostrados na tabela 1.
- Cuidadosamente, remova o chip TEM o titular de silício. Inspecione a resistir uniformidade sobre a janela TEM usando um microscópio óptico. Se o filme é homogêneo em toda a região central da membrana, prossiga para a próxima etapa; caso contrário, repita o processo de revestimento resiste em uma janela TEM fresco.
| Resistir a | Velocidade de centrifugação (x g) | Filme Espessura (nm) | Temperatura de cozimento (° C) | Tempo de cozimento (min) |
| Positivo-Tom PMMA | 60 | 30 | 200uma | 2um |
| Negativo-Tom PMMA | 60 | 15 | 200uma | 2um |
| HSQ | 107 | 10 | Não é necessáriob | Não é necessáriob |
| umver Ref.12; bconsulte ref. 13 | ||||
Tabela 1: rotação revestimento e parâmetros de cozimento de resistir. Unidades de velocidade de rotação em x g consideram um chip TEM de 3 mm de diâmetro. Cozimento é executado em uma chapa quente de PMMA. Sem cozimento é necessária para HSQ13. Resist HSQ é armazenado refrigerado, então ele precisa aquecer à temperatura ambiente antes de girar.
3. carga de amostra no tronco, mapear as coordenadas de janela e executar com foco de alta resolução
- Monte o chip TEM resist-revestido no suporte de amostra do tronco, certificando-se que a interface de resist-vácuo enfrenta o feixe de entrada, desde que o feixe de forma otimizada é focado na parte superior da amostra. Também, certifique-se que os lados da janela TEM estão alinhados aproximadamente com o x - e eixo y da fase de tronco. Isto facilitará a navegar para a janela de temperatura.
- Carregue o chip TEM o microscópio e a bomba durante a noite para reduzir os contaminantes na câmara de amostra.
- Mova as coordenadas do palco (x, y) tal que o feixe é mais de 100 µm, longe do centro da janela TEM (para evitar a exposição acidental). Definir o raio de sonda haste atual e energia para 34 (PA) e 200 keV, respectivamente.
- No modo de difração da imagem latente (feixe estacionário, modo z-contraste e ângulo médio detector de campo escuro anular), conjunto ampliação para 30 kX com o feixe de fora de foco, o que torna mais fácil encontrar uma borda da janela TEM.
Nota: As bordas de janela TEM também podem ser encontradas no modo de imagem. Usamos o modo de difração, porque é mais rápido, uma vez que o feixe não precisa ser examinado para formar uma imagem. - Navegar para a janela TEM até uma borda da janela é observada na imagem de difração. Navegar ao longo das bordas da janela e registro (x, y) coordenadas dos quatro cantos da janela TEM.
- No último canto da janela, aumentar a ampliação para 50 kX e executar áspero com foco na membrana janela movendo o palco-coordenada z (ajuste de z-altura) até o crossover de difração a orientação padrão é observada. Posteriormente, realize com foco fino ajustando o atual da lente objetiva.
- Aumente a ampliação para 180 kX. Ajustar o foco, as configurações de correção stigmation e aberração a fim de obter uma imagem de difração de correção de aberração da membrana janela conforme mostrado na Figura 2B. Este método de focagem é conhecido como o método de Ronchigram14.

Figura 2 : Imagem de difração de membrana de janela TEM. (A) Focused mas imagem estiletes. As configurações de correção de aberração para esta imagem não são ideal, como evidenciado por franjas espaçadas difração. (B) pronto para exposição não-stigmated imagem mostrando um padrão de difração do planalto suave. Clique aqui para ver uma versão maior desta figura.
4. expor padrões usando uma haste de correção de aberração, equipada com um sistema de gerador de padrão.
Nota: A haste de aberração corrigida usada neste trabalho é equipada com um sistema de gerador de padrão (PGS), que controla a posição do feixe de elétrons para expor padrões definidos usando o software de design (CAD) auxiliado por computador. Dose é controlado por definir o espaçamento entre os pontos de exposição (tamanho de passo) e o tempo de exposição por ponto. A tabela 2 resume os parâmetros de exposição utilizados neste protocolo. Os padrões são expostos no centro da janela TEM em "modo contínuo", uma vez que a haste usada neste trabalho não inclui um feixe blanker. Antes e após a exposição, PGS posiciona o feixe em qualquer ponto definido pelo usuário no campo de visão (FOV), de preferência longe da área de padrão. Usamos neste protocolo o direito cantos superior e inferior direito do FOV como as posições inicial e final da viga, respectivamente.
| Resistir a | Exposição de ponto | Linha de exposição | Exposição da área | ||
| Dose (fC/ponto) | Tamanho de passo (nm) | Dose (nC/cm) | Tamanho de passo (nm) | Dose (µC/cm2) | |
| Tom positivo PMMA | 10-100 | 0,5 | 2 – 8 | 0,5 | 2.000 |
| Tom negativo PMMA | 50-500 | 0,5 | 20 – 40 | 0,5 | 50.000-80.000 |
| HSQ | 10-100 | 0,5 | 10 – 20 | 0,5 | 20.000-30.000 |
Tabela 2: parâmetros de exposição para PMMA (Tom positivo e negativo) e HSQ resiste. Os valores mostrados são genéricos, desde que a dose ideal valores dependem o design padrão específico e direcionado a dimensões de recurso.
- Feche a válvula de portão do feixe para evitar qualquer exposição acidental da resistir ao mover o palco. Verifique se a corrente do feixe é pA 34 e ampliação é 180 kX.
- Use as coordenadas do canto de janela pré-gravadas para mover o palco, para que o centro FOV é de 5 µm, longe do centro da janela. Abra a válvula de porta do feixe e o foco neste momento usando o método de Ronchigram descrito no passo 3.6.
- Feche a válvula de portão de feixe. Mova o palco para colocar o FOV no centro da janela TEM. Alterar a ampliação com 18 kX (correspondente a uma x 5 de 5 µm µm padronização FOV). Transferir o controle do feixe para PGS e posicionar o feixe em qualquer lugar longe da área de padrão (usamos no canto superior direito no presente protocolo).
- Execute as seguintes ações em sucessão rápida para evitar a superexposição a resistir as posições inicial e final do feixe.
- Abra a válvula e verificar, observando a imagem de padrão de difração do feixe, se o feixe está em foco na posição inicial do feixe (como na Figura 2B). Expor o padrão.
- Quando a exposição estiver concluída, verifique se a imagem do padrão de difração permanece em foco na posição final do feixe. Finalmente, feche a válvula de portão.
- Remova o chip TEM o tronco.
5. resista desenvolvimento e ponto crítico de secagem
Nota: O processo de desenvolvimento depende a resistir usado. Passos, 5.1, 5.2 e 5.3 descrevem o processo de desenvolvimento para Tom positivo PMMA, negativo-Tom PMMA e HSQ, respectivamente. No entanto, tudo resiste a compartilhar o mesmo ponto de crítica final, secagem, que é necessário para evitar o colapso do padrão devido a alta proporção dos padrões fabricados com este protocolo. Ponto crítico (CPD) de secagem usa líquido de CO2 como fluido de trabalho, o que não é miscível com a água. Por conseguinte, desidratação de amostra (etapas 5.4-5,7) requerem o uso de ACS reagente grau com álcool isopropílico (IPA).
- Desenvolvimento de tom positivo PMMA15: preparar um copo de 100 mL, com solução 3:1 de IPA:methyl isobutil-cetona (MIBK). Colocar o copo em um Circulador de banho a 0 ° C (um banho de gelo a 0 ° C é uma alternativa de custo mais baixa) e esperar até que a temperatura é equalizada. Pegue o chip TEM com um par de pinças e mexa delicadamente na solução fria por 30 s. Proceda com o passo 5.4.
- Desenvolvimento de Tom negativo PMMA16: gentilmente mexa o chip TEM em MIBK na temperatura de quarto (24 ° C) por 2 min. transferir a amostra para uma solução de acetona e mexa por 3 min. Proceda com o passo 5.4.
- Desenvolvimento de HSQ13: Misture o chip TEM uma solução de água desionizada "salgado", contendo 1 wt % NaOH e 4 wt % NaCl, por 4 min a 24 ° C. Misture o chip em água deionizada pura por 2 min (enxaguar o desenvolvedor salgado). Prossiga com a etapa 5.4.
- Mergulhe o chip TEM no grau de reagente ACS IPA e agite-o delicadamente para 30 s.
- Rapidamente, coloque o chip TEM a bolacha de Si especial 2" mostrada na Figura 3A. Certifique-se de que o chip TEM sempre está molhado com IPA durante a transferência. Após aproximadamente 2-3 min, perto do conjunto de suporte de bolacha CPD conforme representado na Figura 3B. Deixe a unidade inteira imersão na série de reagente ACS IPA para 15min adicional totalmente imergido no IPA.
- Rapidamente transferir o conjunto de suporte de bolacha CPD completo para um segundo recipiente com grau de reagente ACS fresco IPA e deixá-lo por 15 min, totalmente imergido no IPA.
- Transferência do conjunto de suporte do CPD da bolacha para a câmara de processo de instrumento CPD (em todas as vezes que o chip TEM deve ser totalmente imerso no AFI). Execute o processo CPD, seguindo as instruções de funcionamento do instrumento.
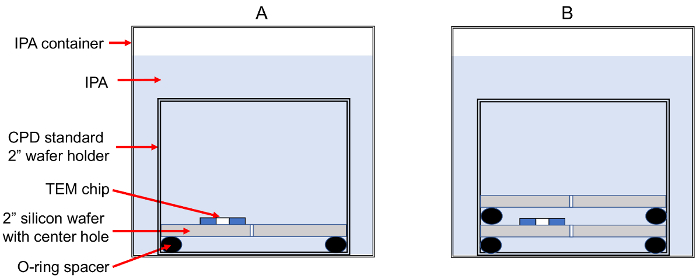
Figura 3 : Solução in-house para desidratação de TEM chips em um CPD padrão 2" titular da bolacha. (A) vista esquemática do lado do chip TEM em uma bolacha de Si especial 2" com um pequeno orifício perfurado no centro (aproximadamente 500 μm de diâmetro) para permitir o fluxo de líquido. A hóstia se encaixa em um CPD padrão 2" bolacha suporte fornecido pelo fabricante do sistema CPD. (B) uma segunda bolacha de Si especial inclui o chip TEM, reduzindo assim o fluxo turbulento durante o processo CPD. Em A e B, o titular de bolacha CPD está totalmente imerso na série de reagente ACS IPA. Clique aqui para ver uma versão maior desta figura.
Resultados
A Figura 4 mostra padrões litográficas em tom positivo PMMA (resist removido das regiões expostas após desenvolvimento) e Tom negativo PMMA (resist removido de áreas não expostas). Windows TEM consistiam de aproximadamente 30 nm grosso PMMA resistir para Tom positivo PMMA (15 nm grosso para negativo-Tom PMMA) rotação sobre um 5 nm grosso pecadox da membrana. Uma fina película metálica (10 nm AuPd mais 5 nm Ti) foi depositado após desenvolvimento de PMMA de tom positivo para realçar o contraste durante a imagem latente do tronco. Para Tom positivo PMMA, o médio menor recurso isolado é 2,5 ± 0,7 nm (Figura 4, 4D), enquanto o menor padrão de arremesso é 17,5 nm (Figura 4F). Para Tom negativo PMMA, o médio menor recurso isolado é 1,7 ± 0,5 nm (Figura 4), enquanto o menor padrão de arremesso é 10,7 nm (Figura 4J).

Figura 4 : Litografia de feixe de elétrons de correção de aberração de positivo e negativo-Tom PMMA. (Uma película fina de 10 nm AuPd mais 5 nm Ti foi depositado sobre os padrões PMMA tudo positivo-Tom mostrados nesta figura.) Imagem de SEM (A) de padrões arbitrários em tom positivo PMMA. (B) imagem TEM de padrões arbitrários em tom negativo PMMA. (C, D) Imagens SEM dos menores estampados buracos em PMMA tom positivo, com diâmetro de furo médio de 2,5 ± 0,7 nm. (E, F) Imagens SEM de buraco matrizes definidas na PMMA tom positivo, com uma densidade de 21,5 nm (E) e 17,5 nm (F). (G, H) Imagens de temperatura de matrizes de pilar, em tom negativo PMMA com discurso de 20 nm e com diâmetro médio de pilar de 1,7 ± 0,5 nm (G) e 1,8 ± 0,5 nm (H). (I, J) Imagens TEM de negativo-Tom PMMA pilar matrizes de arremesso de 15,2 e 10.7 nm, respectivamente. Todas as barras de escala são 40 nm. Esta figura tem sido reproduzida de Manfrinato, V.R., Stein, A., Zhang, L., Nam, C.-Y., Yager, K.G., Stach, Basilio e preto, C.T. Aberration-Corrected Electron Beam litografia na escala de comprimento de um nanômetro. Nano Lett. 17 (8), 4562-4567 (2017). Clique aqui para ver uma versão maior desta figura.
A Figura 5 exibe padrões definidos na resist HSQ. A janela TEM usada para litografia HSQ consistia de aproximadamente 10 nm grosso HSQ resistir spin convertida numa membrana de Si grosso nm 27. Após a exposição e resiste desenvolvimento, 3-4 nm da camada ultra-fino de Si nas regiões HSQ-livre (áreas não expostas) da janela foram removidos por indutiva acoplado gravura de plasma (ICP), usando uma mistura de 50 sccm HBr e 20 sccm Cl2 gases a uma pressão da câmara de 10 mT (bias e poder ICP de 60 W e 250 W, respectivamente). Figura 5A é composto por quatro linhas de linhas verticais curtas. O superior duas linhas foram expostas com uma dose de linha pisou exponencialmente de 2 nC/120cm (largura 0 de nm projetado para essas linhas). As duas linhas inferiores foram expostas com uma dose de área pisada exponencialmente de 3.000 para 60.000 denominado/cm2 (5 retângulos de largura e 200 nm tempo projetado nm). Figura 5B é uma imagem ampliada da região centro a linha inferior na Figura 5A. Os dois mais à esquerda, o centro de quatro e as quatro linhas de extrema direita foram expostas com uma dose de área de 23.300, 27.300 e 32.000 denominado/cm2, respectivamente. O centro de quatro linhas têm uma largura média de medida de 7 nm.

Figura 5 : Litografia de feixe de elétron aberração corrigida de resistir HSQ. (A janela TEM usada nesta figura foi feita de 27 nm de espessura Si. Após desenvolvimento HSQ, gravura de plasma acoplado indutivo foi usada para remover 3-4 nm de Si de áreas não abrangidas por HSQ.) (A) imagem TEM de quatro linhas de linhas verticais expostos com doses variando exponencialmente entre 2 e 120 nC/cm (top duas linhas) e 3.000 para 60.000 denominado/cm2 (duas linhas de fundo). O tamanho do passo de feixe foi 0,5 nm para todas as linhas. (B) imagem de temperatura alta ampliação da área central da linha de fundo em (A). O grupo de 4 linhas no centro tem uma média medida largura de 7 nm e foram expostos com uma dose de área de 27.300 denominado/cm2. Clique aqui para ver uma versão maior desta figura.
Discussão
O passo mais crítico no protocolo está focalizando o feixe de elétrons antes da exposição. Isto é necessário para atingir a padronização de maior resolução. Ao realizar exposições múltiplas (por exemplo, quando um chip TEM tem várias janelas e cada um está sendo modelado), é importante redirecionar o feixe antes de cada exposição a uma distância de 5 μm na maior parte da área de exposição. O protocolo também inclui etapas para verificar se o foco do feixe antes e após a exposição em duas posições extremas da área de padronização (cantos superior e inferior), que permite a determinação de se alguma desfocagem ocorreu durante a padronização, por exemplo devido a uma membrana localmente sendo inclinada na região de padronização.
Outro passo importante neste protocolo é usando o ponto crítico (CPD) de secagem para secar amostras depois de desenvolver o exposto resistem padrões. Sem esta etapa, padrões frequentemente entrará em colapso devido a alta proporção das estruturas modeladas (i.e., modelado resiste lateral dimensões menores que a espessura). A maioria dos sistemas do CPD fornecer um padrão 2" titular de bolacha. No entanto, desde que TEM chips são muito pequenas e as estruturas modeladas são muito delicadas, eles podem ser danificados durante o processo CPD, quando colocados nos suportes projetados para amostras maiores. A Figura 3 mostra uma solução in-house por fichas do CPD da temperatura usando um suporte padrão da bolacha. Os dois discos (wafers), com um buraco de habilitação de fluxo no centro, coloque o chip TEM e impeça o fluxo turbulento durante o processo CPD.
A determinação da espessura da película resiste ideal tenta equilibrar os requisitos de concorrentes. Por um lado, deverão ser tão fina quanto possível para alcançar a mais alta resolução e para evitar o colapso do padrão, mas por outro lado, deve ser grossa o suficiente para aplicações de transferência padrão como descolagem e gravura. Este protocolo usa 1% HSQ, qual é a menor diluição comercialmente disponível e cuja diluição mais no laboratório não é recomendada (nossa experiência mostra que diluídos HSQ conduz frequentemente a reticulação parcial). No entanto, desde que o PMMA diluído dá resultados reprodutíveis, este protocolo usa 1% para Tom positivo PMMA (espessura de 30 nm) e 0,5% e 1% para o tom negativo (espessura de 15 a 30 nm, respectivamente). Encontramos que resiste PMMA positivo-Tom não sofre colapso padrão como PMMA negativo-Tom, assim, o recurso de espessura mais fina para Tom negativo como mostrado no tabela 1. Além disso, Tom negativo PMMA tem ~ 50% de perda de espessura após a exposição e-feixe (e antes de desenvolvimento), então a espessura final de Tom negativo PMMA é ~ 7 a 15 nm. (As características de nm 1.7 e 1.8 da Figura 4 tem cerca de 7 nm resist espessura, o que está no limite do colapso do padrão). Os padrões PMMA, mostrados na Figura 4 não usou uma etapa CPD; no entanto, se estiver disponível, este protocolo recomenda o uso de CPD após o desenvolvimento de padrões PMMA. Em contraste, encontramos CPD para ser crítico para HSQ processamento devido ao fato de que ele não pode ser mais diluído (para atingir a espessura mais fina) e porque padrões HSQ mais grossos são necessárias para usar como uma máscara de gravura (por exemplo, para gravar silício como mostrado na Figura 5 de ).
Os padrões PMMA de tom positivo na Figura 4 foram revestidos com uma fina película metálica para aumentar o contraste durante a imagem latente. As informações de apoio no trabalho de Manfrinato et al. 1 mostra que o efeito deste revestimento metálico sobre a metrologia dos padrões é insignificante. Da mesma forma, consideramos que os resultados mostrados na Figura 5 para HSQ resistir não depende drasticamente a escolha particular TEM janela estrutura com base na espessura ultra fina da camada subjacente de Si.
O melhor de nosso conhecimento, todas as medidas descritas na seção de resultados de representante para negativo e positivo --Tom PMMA1 (Figura 4) são as características menores relatadas na literatura até à data de1,7 , 12 , 16 , 17. Manfrinato et al. 1 também demonstrou a transferência de padrão sub-5 nm, desde a resistir a um material do alvo, usando a decolagem de metal convencional (para Tom positivo PMMA) e infiltração sequencial síntese18 de ZnO (para Tom negativo PMMA). Os resultados mostrados na Figura 5 para HSQ não são o menor relatado características7. No entanto, este protocolo é útil para a obtenção de recursos pode ser reproduzidos no HSQ em resoluções melhores que 10 nm e demonstra o dígito a padronização das estruturas de silício.
O protocolo aqui apresentado descreve um processo para padronização de estruturas arbitrárias com resolução de nanômetros de dígito simples usando o feixe de elétrons convencional resiste PMMA e HSQ. Além disso, os resultados mostrados aqui e na Ref. 1 demonstram que esses padrões podem ser transferidos com alta fidelidade a um material alvo de escolha.
Divulgações
Os autores não têm nada para divulgar.
Agradecimentos
Esta pesquisa usou recursos do centro para nanomateriais funcionais, que é uma DOE EUA escritório de ciência, na Brookhaven National Laboratory sob contrato n º DE-SC0012704.
Materiais
| Name | Company | Catalog Number | Comments |
| Plasma asher | Plasma Etch | PE-75 | Located in class 100 cleanroom |
| Silicon Nitride 5 nm thick TEM Windows (9 SMALL Windows) | TEM windows.com | SN100-A05Q33A | |
| TEM chip holder for resist coating | Home made | ||
| 27 nm thick c-Si TEM Windows | TEMwindows.com | Custom order | |
| A2 950K PMMA diluted in anisole to 0.5-1.0% by weight | MicroChem | M230002 | |
| HSQ (1% solids XR-1541) e-beam resist in MIBK | Dow Corning | XR-1541-001 | |
| Spinner | Reynolds Tech | ReynoldsTech Flo-Spin system | Located in class 100 cleanroom |
| Hot plate | Brewer Science | CEE 1300X | Located in class 100 cleanroom |
| Spectral reflectometer | Filmetrics | F20 | Located in class 1000 cleanroom |
| Bath circulator | Thermo Scientific | Neslab RTE 740 | Located in class 100 cleanroom |
| Optical microscope | Nikon | Eclipse L200N | Located in class 1000 cleanroom |
| MIBK/IPA 1:3 developer | MicroChem | M089025 | |
| Sodium hydroxide | Sigma-Aldrich | 221465 | |
| Sodium chloride | Sigma-Aldrich | 31434 | |
| Isopropyl Alcohol, ACS Reagent Grade | Fisher Scientific | MK303202 | |
| TEM chip holder for critical point drying | Home made | ||
| Critical point drying system | Tousimis | Autosamdri-815B, Series C | Located in class 100 cleanroom |
| Aberration-corrected STEM | Hitachi | HD 2700C | |
| Pattern generation system | JC Nabity Lithography Systems | NPGS v9 | |
| Scanning Electron Microscope (SEM) | Hitachi | S-4800 | |
| Reactive ion etcher | Oxford Instruments | Plasmalab 100 | Located in class 1000 cleanroom |
Referências
- Manfrinato, V. R., Stein, A., Zhang, L., Nam, C. Y., Yager, K. G., Stach, E. A., Black, C. T. Aberration-Corrected Electron Beam Lithography at the One Nanometer Length Scale. Nano Letters. 17 (8), 4562-4567 (2017).
- Chen, W., Ahmed, H. Fabrication of 5-7 nm wide etched lines in silicon using 100 keV electron-beam lithography and polymethylmethacrylate resist. Applied Physics Letters. 62 (13), 1499-1501 (1993).
- Vieu, C., Carcenac, F., Pepin, A., Chen, Y., Mejias, M., Lebib, A., Manin-Ferlazzo, L., Couraud, L., Launois, H. Electron beam lithography: resolution limits and applications. Applied Surface Science. 164, 111-117 (2000).
- Hu, W., Sarveswaran, K., Lieberman, M., Bernsteina, G. H. Sub-10 nm electron beam lithography using cold development of poly(methylmethacrylate). Journal of Vacuum Science & Technology B. 22 (4), 1711-1716 (2004).
- Chen, Y. Nanofabrication by electron beam lithography and its applications: A review. Microelectronic Engineering. 135, 57-72 (2015).
- Jiang, N. On the spatial resolution limit of direct-write electron beam lithography. Microelectronic Engineering. 168, 41-44 (2017).
- Manfrinato, V. R., Zhang, L., Su, D., Duan, H., Hobbs, R. G., Stach, E. A., Berggren, K. K. Resolution Limits of Electron-Beam Lithography toward the Atomic Scale. Nano Letters. 13 (4), 1555-1558 (2013).
- Isaacson, M., Muray, A. In situ vaporization of very low molecular weight resists using 1/2 nm diameter electron beams. Journal of Vacuum Science & Technology B. 19 (4), 1117-1120 (1981).
- van Dorp, W. F., van Someren, B., Hagen, C. W., Kruit, P. Approaching the Resolution Limit of Nanometer-Scale Electron Beam-Induced Deposition. Nano Letters. 5 (7), 1303-1307 (2005).
- Fuechsle, M., Miwa, J. A., Mahapatra, S., Ryu, H., Lee, S., Warschkow, O., Hollenberg, L. C. L., Klimeck, G., Simmons, M. Y. A single-atom transistor. Nature Nanotechnology. 7 (4), 242-246 (2012).
- Randall, J. N., Lyding, J. W., Schmucker, S., Von Ehr, J. R., Ballard, J., Saini, R., Xu, H., Ding, Y. Atomic precision lithography on Si. Journal of Vacuum Science & Technology B. 27 (6), 2764-2768 (2009).
- Arjmandi, N., Lagae, L., Borghs, G. Enhanced resolution of poly(methyl methacrylate) electron resist by thermal processing. Journal of Vacuum Science & Technology B. 27 (4), 1915-1918 (2009).
- Yang, J. K. W., Berggren, K. K. Using high-contrast salty development of hydrogen silsesquioxane for sub-10-nm half-pitch lithography. Journal of Vacuum Science & Technology B. 25 (6), 2025-2029 (2007).
- Lin, J. A., Cowley, J. M. Calibration of the operating parameters for an HB5 STEM instrument. Ultramicroscopy. 19 (1), 31-42 (1986).
- Cord, B., Lutkenhaus, J., Berggren, K. K. Optimal temperature for development of poly(methylmethacrylate). Journal of Vacuum Science & Technology B. 25 (6), 2013-2016 (2007).
- Duan, H. G., Winston, D., Yang, J. K. W., Cord, B. M., Manfrinato, V. R., Berggren, K. K. Sub-10-nm half-pitch electron-beam lithography by using poly(methyl methacrylate) as a negative resist. Journal of Vacuum Science & Technology B. 28 (6), C6C58-C6C62 (2010).
- Dial, O., Cheng, C. C., Scherer, A. Fabrication of high-density nanostructures by electron beam lithography. Journal of Vacuum Science & Technology B. 16 (6), 3887-3890 (1998).
- Kamcev, J., Germack, D. S., Nykypanchuk, D., Grubbs, R. B., Nam, C. Y., Black, C. T. Chemically Enhancing Block Copolymers for Block-Selective Synthesis of Self-Assembled Metal Oxide Nanostructures. ACS Nano. 7 (1), 339-346 (2013).
Reimpressões e Permissões
Solicitar permissão para reutilizar o texto ou figuras deste artigo JoVE
Solicitar PermissãoThis article has been published
Video Coming Soon
Copyright © 2025 MyJoVE Corporation. Todos os direitos reservados