Method Article
אפיון מקיף של פגמים מורחבים סמיקונדקטור חומרים על ידי מיקרוסקופ סורק האלקטרוני
In This Article
Summary
The optical, electrical, and structural properties of dislocations and of grain boundaries in semiconductor materials can be determined by experiments performed in a scanning electron microscope. Electron microscopy has been used to investigate cathodoluminescence, electron beam induced current, and diffraction of backscattered electrons.
Abstract
Extended defects such as dislocations and grain boundaries have a strong influence on the performance of microelectronic devices and on other applications of semiconductor materials. However, it is still under debate how the defect structure determines the band structure, and therefore, the recombination behavior of electron-hole pairs responsible for the optical and electrical properties of the extended defects. The present paper is a survey of procedures for the spatially resolved investigation of structural and of physical properties of extended defects in semiconductor materials with a scanning electron microscope (SEM). Representative examples are given for crystalline silicon. The luminescence behavior of extended defects can be investigated by cathodoluminescence (CL) measurements. They are particularly valuable because spectrally and spatially resolved information can be obtained simultaneously. For silicon, with an indirect electronic band structure, CL measurements should be carried out at low temperatures down to 5 K due to the low fraction of radiative recombination processes in comparison to non-radiative transitions at room temperature. For the study of the electrical properties of extended defects, the electron beam induced current (EBIC) technique can be applied. The EBIC image reflects the local distribution of defects due to the increased charge-carrier recombination in their vicinity. The procedure for EBIC investigations is described for measurements at room temperature and at low temperatures. Internal strain fields arising from extended defects can be determined quantitatively by cross-correlation electron backscatter diffraction (ccEBSD). This method is challenging because of the necessary preparation of the sample surface and because of the quality of the diffraction patterns which are recorded during the mapping of the sample. The spatial resolution of the three experimental techniques is compared.
Introduction
זה כבר ידוע במשך עשרות שנים שהשתרעו פגמים משפיעים על המבנה האלקטרוני של חומרים מוליכים למחצה 1-3. השפעת פגמים המורחבת על הביצועים של מכשירים אלקטרוניים ויישומים אחרים כגון חיישנים וחומרי שמש תאים נמצאת תחת חקירה ניסיונית תיאורטית נרחבת. אף על פי כן, אין תאוריה מקובלת לחישוב של המצבים האלקטרוניים של מוליכים למחצה בנוכחות פגמים מורחבים. זאת בשל המורכבות של מבנה חישובים אלקטרוניים במקרה של החריגות הגבישי האידיאלית וגם למגוון הגדול של סוגים והתצורה של פגמים מורחבים, כמו גם את הצירופים האפשריים ביניהם ועם 0-עמום פנימי פגמים חיצוניים.
הסוגים העיקריים של פגמים מורחבים הם לנקעים (פגמים 1-ממדי) וגבולות דגנים (2-ממדי פגמים). בחלק הבא, אנו משתפיםncentrate על שני סוגים אלה של פגמים המורחבת במונחים של ניסויים שניתן לבצע ב מיקרוסקופ אלקטרונים סורק (SEM). השיטות הניסיוניות המוצגות כאן לתת מידע על תכונות מבניות, אופטיות וחשמליות של פגמים מורחבים, ולכן ידע עקיף של המצבים האלקטרוניים בחומרים מוליכים למחצה המכילים פגמים מורחבים. השליטה של מצבים אלקטרוניים הקשורים הפגם הוא נושא מרכזי עבור היישום של מוליכים למחצה והמבצע של התקני מוליכים למחצה.
לקראת החקירה המבנית של פגמים מורחבים, backscatter אלקטרון ההשתברות (EBSD) הטכניקה יכולה להיות מיושמת. בדרך כלל, מדידת EBSD מבוצעת על ידי מיפוי נקודות עם אלומת אלקטרונים נייחת בכל נקודה. EBSD אז מניב מידע אודות כיוון crystallographic של הסריג הגבישי של המדגם במקרה של חומר יחיד גבישים של הגרגרים בחומרי polycrystalline. For כי מטרת דפוסי העקיפה לקבוע באופן ניסיוני נוצרו על ידי להקות קיקוצ'י צריכים להיות מנותחת על ידי השוואה עם דפוסים מדומים נקבעו מקבוצת מרחב הגביש של החומר. אם התוכנה עבור ההערכה של נתוני האורינטציה היא מסוגלת לחשב את זווית misorientation בין מערכות קואורדינטות crystallographic של נקודות מיפוי שכנות, את סוג גבול תבואה ביניהם ניתן לקבוע. אם הזווית misorientation הוא קטן מ 15 °, גבול תבואה בזווית נמוכה (LAGB) קיים; אחר זה הוא גבול תבואה גבוהה זווית (HAGB). סוג HAGB מאופיין ערך Σ שלה שבו Σ -1 הוא השבריר של נקודות סריג שוכבות על סריג צירוף מקרים. אז, Σ = 3 מייצג את גבול התאום הסימטרי מאוד 4. אם מיפוי EBSD בשני מישורים של שטח המדגם ניתן למדוד עם ידע מדויק של העמדות של המיפוי, את סוג מטוס גבול התבואה wה- i מילר מדדי hkl ניתן להעריך גם על ידי השיטה המוצעת על ידי רנדל 5.
לאחרונה, נוהל חדש עבור ההערכה של הדפוס העקיף אלקטרונים נגזר על ידי ווילקינסון et al. 6 המאפשרים החישוב של כל מרכיבי מותח הזן המקומי השלם, כלומר., בערכים מוחלטים של שלושה הזן הנורמלי זן הגזירה השלוש רכיבים. חישוב זה מבוצע עבור כל נקודת מדידה ב מיפוי מהתבנית עקיפה המקביל ביחס דפוס התייחסות נלקח על אזור קריסטל unstrained עם אותה אוריינטציה קריסטלוגרפיים. הליך הערכה זו מבוסס על קביעת המשמרות קטנות של תכונות אופייניות של דפוס EBSD בטכניקה-מתאם צלב אשר נותנת את השם ccEBSD. ביחס לנקודת התייחסות נבחרת, הרכיבים לכאביה סיבובי סריג ניתן למדוד עם precisions של 10 -4 ו 0.006 & #176 ;, בהתאמה 7. החלת מדידות ccEBSD בתור סורקת את פני גבולות גרעין, או לאורך הסדרים של לנקעים, אפשר לקבוע באופן מקומי בסך וכן המגוון של שדות המתח של הפגמים המקיפים הללו.
התכונות האופטיות של לנקעים גבולות הגרעין יכול להיחקר על ידי טכניקות רפאים הדמיה cathodoluminescence (CL). אות ההארה נגרמת על ידי רקומבינציה הקרינה של זוגות אלקטרון-חור אשר נוצרות בחומר המוליך למחצה על ידי קרן האלקטרונים העיקרית של SEM. עוצמת ההארה היא יחסי יעילות רקומבינציה קרינה שהוא היחס של פעם בחיים מובילים מיעוט מסך זמן רקומבינציה הקרינה. כאשר יחס זה מושפע באופן מקומי על ידי פגמים, ניגוד בחלוקת ההארה ניתן לצפות בתמונות CL. בדרך כלל, פגמים המורחבת לפעול כמרכזי רקומבינציה לא מקרין, ולכן אפשרויות luminescence מ-band-רקומבינציה הלהקה הוא ירד בקרבת פגמים הוארך בהשוואה מוליכים למחצה באין מפריע. עם זאת, במקרה של Si, Ge וכמה חומרים מוליכים למחצה מתחם, ב לנקעים וכן על גבולות גרעין, להקות הארת מאפיין נצפות מראות אנרגיות פוטון נמוכות מזו של להקה אל להקה (הישירה או בלתי ישירה) רקומבינציה ב עיקר החומר 8-10. כדוגמא, חקירות CL נרחבות של פרוסות סיליקון מלוכדות של סיליקון רבים-גבישים ידי Sekiguchi ועמיתים לעבודה 11-13 גילו כי לנקעי LAGBs אחראים להתרחשות של רמות רדודות בעומק פער הלהקה. מעברי הקרינה המקבילים מסומנים כקווי D בספקטרום CL. אף על פי כן, התפקיד של שדה זן מלווה הסדרים של לנקעים של זיהום עקירה על ידי משקעי חמצן וזיהומי מתכת מעבר עדיין שנוי במחלוקת עבור interpretatיון של הארת קו D. אבל, אם המחאה לתפקיד האנרגיה של קו הארת פגם מורחב ברור יכולה להתבצע בהצלחה, ואז את המופע של הקו הספציפי הזה בספקטרום ההארה ניתן לקחת כאיתות לנוכחות של פגם זה. כדי להגביר את עוצמת ההארה, כלומר., רקומבינציה הקרינה ביחס אחד לא מקרין, חקירות CL צריכות להתבצע בטמפרטורות נמוכות (קריו-CL) עבור חומרים מוליכים למחצה עם מבני להקה עקיפים.
התכונות החשמליות של הפגמים המורחבים נחשבים כאן מאופיינות הדמית זרם מושרה אלומת אלקטרונים (EBIC) ב SEM. זרם זה ניתן להבחין כאשר זוגות אלקטרון-חור שנוצרו על ידי קרן האלקטרונים העיקרית הם מופרדים על ידי שדה חשמלי מובנה. שדה זה יכול להיווצר על ידי הפוטנציאל החשמלי של פגמים המורחבת עצמם או על ידי אנשי קשר שוטקי על פני השטח מדגם. תמונת EBIC בניגוד תוצאות וריאציות מקומיות של יעילות תשלום הגבייה בשל התנהגות רקומבינציה משתנית ב פגמים פעילים חשמלי. הליקויים המורחבים בדרך כלל להראות רקומבינציה מוביל גדל, כך שהם מופיעים כהים בתמונת EBIC מאשר אזורי פגם חינם. במסגרת מודלים המבוססים פיזית של פגמים 14, הערכה כמותית של התלות המרחבית של האות EBIC, אשר נקרא פרופיל לעומת זאת, מאפשרת לקבוע את אורך החיים דיפוזיה המוביל מיעוט כמו גם את מהירות רקומבינציה השטח. בגלל פרמטרים אלה תלויים בטמפרטורה, חקירות EBIC צריכות להתבצע גם בטמפרטורה נמוכה (קריו-EBIC) כדי לקבל אות משופרת יחס רעש. לחלופין, מדידות תלויות EBIC טמפרטורה לאפשר קביעת הריכוז של זיהומים ברמה עמוקים ב לנקעים על פי מודל אשר הוצע על ידי Kittler ועמיתים לעבודת 15,16.
s = "jove_content"> יצוין כי התכונות האופטיות וחשמליות של פגמים המורחבת במוליכים למחצה יכולות להיות מושפעות באופן משמעותי על ידי זיהום וחלקי פנים עמומים 0 פגמים מהותיים 17 אשר לא ניתן לפתור על ידי סריקת מיקרוסקופ אלקטרונים. עם זאת, השילוב של שיטות הניסיוניות, ccEBSD, CL ו EBIC, מציע את ההזדמנות כדי להמחיש את הפגמים המורחבים לכמת תכונות הבסיסיות שלהם SEM. ביישומים עתידיים, שבו לא ניתוח כישלון יחיד, אלא גם לערוק מלא הנדסת פגם נועדו, כלי רב עצמה זה יהיה תפקיד חשוב בשיפור הביצועים של התקני מוליכים למחצה.
Protocol
1. הכנת דוגמאות עבור ניסוי קריו CL
- השתמש מדגם בתפזורת מחומר מוליך למחצה (כאן: סיליקון) עם משטח מישורים, שטח פנים מקסימאלי של 5 מ"מ x 5 ועובי בטווח שבין 0.2 ו -0.5 מ"מ.
- נקו את המדגם בעל מדגם עם ממסים אורגניים כגון אתנול או אצטון. הסר את שכבת פני שטח תחמוצת סיליקון על המדגם על ידי טבילה בתמיסה של חומצה הידרופלואורית (40%) ומים לא מיוננים על יחס של 1:10 דקות 1. לשטוף את המדגם עם מים מיוננים דה.
- מיל חתיכת חוט אינדיום מכאני לגבש רדיד אינדיום עם שטח פנים תואם לזה של המדגם עם עובי של כ 0.5 מ"מ.
- הר בעל ° -pre-מוטה 60 מדגם על שקע מתכתי, לשים את נייר הכסף אינדיום על בעל מדגם ואת המדגם על גבי.
- מניחים את השקע על גבי צלחת חימום.
- הפעילו את צלחת חימום, הטמפרטורה שליטה על שקע עם thermometer ומחמם השקע עד 150 מעלות צלזיוס, כך תהליך ההתכה של רדיד אינדיום הוא קרוב.
הערה: אין צורך כי אינדיום מגיע לנקודת ההתכה ב 157 ° C אבל את נייר הכסף צריך להיות רקיע. - תקן המדגם על נייר הכסף אינדיום ידי לחיצה על המדגם עם קיסם עץ 1 שניות.
- כבו את צלחת חימום לצנן את המערכת כולה במשך כ -30 דקות.
2. הכנת המדגם עבור ניסוי קריו EBIC
- השתמש מדגם בתפזורת מחומר מוליך למחצה (כאן: סיליקון) עם משטח מישורים, שטח פנים מקסימאלי של 5 מ"מ x 5 ועובי בטווח שבין 0.2 ו -0.5 מ"מ.
- נקו את המדגם בעל מדגם עם ממסים אורגניים כגון אתנול או אצטון. הסר את שכבת פני שטח תחמוצת סיליקון על המדגם על ידי טבילה בתמיסה של חומצה הידרופלואורית (40%) ומים לא מיוננים על יחס של 1:10 דקות 1. לשטוף את המדגם עם מים מיוננים דה.
- הר sample למערכת metallizing להתאדות מתכת (למשל., אל על מסוג p Si, Au על מסוג n Si) על פני השטח העליון של המדגם כדי ליצור מגע שוטקי.
- להפקיד אגל של eutectic גליום-אינדיום נוזל על הישבן של המדגם סיליקון ולמרוח מעליו כדי לייצר קשר ohmic.
3. הכנת דוגמאות לניסויים ccEBSD
- כן שטח מדגם שטוח ידי החלת רצף של שיוף והברקת צעדים עם הפחתת גודל חלקיקים של שיוף והברקת סוכנים (למשל., להדביק יהלומים ראשונים 3 מיקרומטר על גיליון נייר, אז יהלומים להדביק 1 מיקרומטר, ליטוש האחרון על מלטש תנודה עם השעית ליטוש). לשטוף את המדגם עם מים מיוננים דה בין כל שלב.
- לסיים את הכנת השטח על ידי ניקוי המדגם באתנול באמבטיה קולית במשך 3 דקות.
- הדקו את המדגם על בעל מדגם מתכתי על ידי קיבוע מכני או על ידי מליטה על ג דבק דו צדדיכרטיסיית arbon.
4. ניסוי קריו CL Performing
- להבטיח את הזמינות של cryogens כמו חנקן נוזלי (LN) והליום נוזלי (LHE) עבור תקופת הניסוי של 8 שעות.
- השתמש שלבית קריו ב SEM.
- הכנס את המראה אור איסוף אליפטי מעמדת החנייה נמדדים מצבה לתוך SEM.
- הר מדגם בדיקה (כאן: מדגם GaAs בתפזורת) עם מעבר פער להקה ישיר על הבמה.
- לפנות את תא SEM עד שסתום תא טור פותח. הגדר את המתח הגבוה האצה פרמטרי הדמית SEM (HV) ל -20 קילו, גודל הצמצם עד 240 מיקרומטר, את המצב הנוכחי הגבוה, מהירות הסריקה של אלומת האלקטרונים ל -1, את ההגדלה ל -200 ואת הפחתת הרעש כדי ממוצע פיקסל.
- השתמש גלאי Everhart Thornley הדמיה עם אלקטרונים משניים. הזז את הבמה לקראת חתיכת המוט עד אלומת האלקטרונים יכולה להיות ממוקדת על פני שטח המדגם ב מרחק עבודה (WD) של 15 מ"מ.
- הפעל את הליך סטארט-אפ של מערכת זיהוי CL כשיפעיל את אספקת החשמל עבור monochromator, אספקת המתח הגבוה עבור צינור מכפיל (PMT), מערכת הקירור PMT ומחשב נייד עם התכנית המלאה CL. להפעיל את תוכנית בקרת CL ולבחור מדידת אות PMT לעומת הזמן.
- הגדר את הערכים המתאימים הניגוד (מקסימום) והבהירות (46%) של PMT.
- יצירת קובץ יומן להקלטת הניסויים.
- התאם את המראה-איסוף אור על מנת למקסם את עוצמת CL הנפרדת על מדגם הבדיקה על ידי הטיה וסיבוב במראה. קלט ספקטרום בדיקת CL באמצעות תכנית בקרת CL.
- Vent תא SEM, להסיר את מדגם הבדיקה, הר המדגם בפועל על רדיד אינדיום על בעל מדגם ולפנות את תא SEM.
- קישור משקע לגזים קריוגני של SEM כשהמפרצון של משאבת דיאפרגמה ידי שפופרות ואקום גמישה. השתמש טבעות מרכוז עם o-ring כאלמנט איטום ולתקןזה עם טבעות ההידוק. לייצב את המערכת באופן מכאני על ידי שילוב של משקל דעיכה בזיווג הצינור.
- חבור את היציאה של משאבת דיאפרגמה ידי צינור ואקום גמיש מערכת סחרור הוא אם הוא זמין. השתמש טבעות מרכוז עם o-ring כאלמנט איטום ולתקן אותה עם טבעות הידוק.
- חבר את חיישן הטמפרטורה של יחידת בקרת טמפרטורה עם מחבר התקע המתאים על במת SEM. הפעל את אספקת החשמל של יחידת בקרת הטמפרטורה.
- להרכיב קלטת חימום על צינור הוואקום הגמיש ליד פורקן גזים קריוגני של SEM.
- תלבש משקפי מגן וכפפות מגן. הכנס את הצינורות עבור הנוזל הוא לתוך LHE דיואר. חבר היציאה של הצינור להעברה הוא כשהמפרצון לגזי קריוגני הבמה-קריו של SEM.
- הגדר את HV פרמטרי אלומת אלקטרונים עד 20 קילו וולט, גודל הצמצם עד 240 מיקרומטר, את המצב הנוכחי הגבוה, מהירות הסריקה של האלקטרוןקרן ל -1, את ההגדלה ל -200 ואת הפחתת הרעש כדי ממוצע פיקסל.
- השתמש גלאי Everhart Thornley הדמיה עם אלקטרונים משניים. הזז את הבמה לקראת חתיכת המוט ולמקד את אלומת אלקטרונים על פני שטח המדגם ב WD = 15 מ"מ עבור ניסויי CL.
- בחר את השטח של עניין על פני שטח המדגם ולסרוק על האזור כולו במהלך הליך הצינון כולו. ודא כי במהלך הניסוי CL כולו פני השטח של המדגם באזור של עניין הוא WD = 15 מ"מ על ידי מיצוב הולם של הבמה.
- להתחיל את ההליך למטה קירור על ידי הזנת טמפרטורת היעד הנמוכה ביותר (למשל., 5 K) ופרמטרים מתאימים בשלט מח"ש אל בקר הטמפרטורה בהתאם למדריך הטכני. פתח את השסתום של הצינור להעברת LHE.
- לנטר את הטמפרטורה המדגמת, לחץ הוא ממשאבת הסרעפת, ואת תפוקת אות CL בלתי הנפרדת מן PMT במהלך הליך קירור למטה. Rלְהַסִיק רוחב החריץ של monochromator אם עוצמת CL הופך להיות גבוה מדי בטמפרטורות נמוכות כדי למנוע נזק PMT.
- גדל הפתח של צינור העברת LHE במידת צורך כדי להגיע לטמפרטורת היעד.
- הקמה מחדש של מ"מ WD = 15 עבור תמונות ממוקדות לאחר שהגיע לטמפרטורת היעד. לתקן את ההתאמה של אספקלריה המאיר-האיסוף עבור עוצמת CL מרבית נפרדת על המדגם בפועל.
- ערכים מתאימים עבור הסורג (300 שורות לכל מ"מ, זוהר ב 1000 ננומטר), אזור רפאים (1,050 ל -1,600 ננומטר), רוחב צעד (5 ננומטר), זמן לכל מדידת נקודות (5 שניות) ושספו רוחב (1 מ"מ) עבור מדידות CL ספקטרלי על מדגם סיליקון. שיא CL ספקטרום של המדגם באמצעות תוכנית בקרת CL ולשמור אותם לדיסק הקשיח של המחשב הנייד.
- בחר במראה מישוריים ב monochromator הדמית CL רָגִישׁ לְכָל הַצבָעִים ולהבה הצורמת באורך גל מסוים הדמית CL מונוכרומטי, בהתאמה. התאם את הבהירות והניגודיותערכים של תמונת CL בטווח ליניארי של התלות של הערכים האפורים מן אות PMT.
- התאם רזולוציית תמונה מתאימה (למשל., 1,024 x 768 פיקסלים), מהירות סריקה ושיטת הפחתת רעש הדמית CL (למשל. עבור בהגדלה בטווח בין 200 ל -1,000 את מהירות סריקה הנמוכה ביותר 14 בשילוב עם ממוצע פיקסל, או סריקה גבוהה מהירות 8 בשילוב עם קו ממוצע מעל 20 שורות). שיא CL תמונות עם התכנית המלאה SEM ולשמור אותם לדיסק הקשיח של המחשב.
- הכנס את השם ואת הפרמטרים של כל ספקטרום ותמונה נמדד במהלך פגישת המדידה כולו לתוך קובץ היומן.
- כבו את HV של אלומת אלקטרונים ולסגור את שסתום תא טור SEM לפני לשינוי הטמפרטורה מדגם ידי הזנת טמפרטורת היעד גבוה לתוך בקר טמפרטורה לחקירות CL תלוי בטמפרטורה.
הערה: מזהה להימנע עצום למטה של אלקטרון האקדח על ידי אי יציבות של dur הוואקום הקאמרי SEMing-התחממות. - פתח את שסתום תא טור SEM ולעבור על HV כאשר הטמפרטורה היעד החדש הוא הגיע ואת ואקום מערכת בתא SEM יציב שוב.
- כבה את HV של אלומת האלקטרונים, לסגור את שסתום תא טור SEM, לסגור את התריס עבור PMT, כבה את אספקת החשמל הקרירה של PMT ולהפעיל את נוהל החימום לאחר שסיים את מידות CL המתוכננות בטמפרטורות נמוכות.
- הסר את ההתקנים וכלים נוספים אשר הורכבו לניסוי קריו-CL מבלי לפתוח את תא SEM.
- השאירו את תא SEM סגור במשך 12 שעות לפחות. בדוק כדי לוודא כי הטמפרטורה של בעל המדגם היא ב RT. אחרת, לחמם את בעל מדגם RT לפני פתיחת תא SEM.
הערה: זו היא למנוע רטיבות בתא SEM. - הסר את המדגם משלב ולפנות את תא SEM.
5. ניסוי קריו EBIC Performing
- צמודבטוח בזמינות LHE עבור משך הניסוי של 8 שעות.
- השתמש שלבית קריו ב SEM.
- ודא צלחת תציץ זמינה עם שכבת Au התאדתה על המשטח העליון.
- סטאק על בעל המדגם ראשון הפיסה תציץ עם שכבת Au ועולה, ואחר המדגם בפועל על תציץ עם מגע שוטקי כלפי מעלה. שים עצה קשר אחד על קשר-שוטקי של המדגם בפועל והשני על השכבה Au התאדו של מיקה.
- לפנות את תא SEM עד שסתום תא טור פותח. הגדר את הערכים המתאימים של HV הפרמטרים הדמיה SEM, גודל הצמצם, מהירות סריקה, צמצום ההגדלה ורעש.
- הפעילו את המגבר הנוכחי מדגם ולבחור את טווח המדידה כך שלוש ספרות אחרי הנקודה העשרונית של הזרם הדגימה מוצגים.
- יצירת קובץ יומן להקלטת הניסויים.
- בצע את השלבים 4.12 כדי 4.16 מהניסויים קריו-CL.
- הגדר את הערכים המתאימים של SEM פרמטרי HV, צמצם גודל, גדלה, מהירות סריקה, ושיטת הפחתת רעש עבור הדמית EBIC (טווח מומלץ של פרמטרים עבור הדמית EBIC של גבולות גרעין הם 10 עד 20 קילו וולט עבור HV, 20 עד 60 מיקרומטר עבור גודל צמצם, 30 1,000 עבור ההגדלה, 9 עד 14 מהירות סריקה, ו פיקסל או מיצוע מסגרת).
- השתמש גלאי הנוכחי מדגם הדמיה EBIC. הזז את הבמה לקראת חתיכת מוט ולמקד את אלומת אלקטרונים עבור WD בטווח בין 15 ל -25 מ"מ.
- בחר את השטח של עניין על פני שטח המדגם ולסרוק על האזור כולו של עניין במהלך הליך הצינון כולו.
- להתחיל את ההליך למטה קירור על ידי הזנת טמפרטורת היעד הנמוכה ביותר (למשל., 200 K) ופרמטרים מתאימים בשלט מח"ש אל בקר הטמפרטורה בהתאם למדריך הטכני. פתח את השסתום של הצינור להעברת LHE.
- צג הטמפרטורה המדגמת והלחץ הוא ממשאבת הסרעפת במהלך מגניבing-למטה.
- פיצול מסך SEM ולנטר את האות של אלקטרונים משניים ממגלת Everart Thornley במקביל אות EBIC מהמגלה הנוכחית מדגמת לצפות הווריאציה של תמונות עם טמפרטורה.
- להתאים מחדש את SEM פרמטרי HV, גודל צמצם, גדלה, מהירות סריקה, וכן הפחתת רעש כדי לקבל תמונות EBIC של ניגודיות גבוהה. Re-להתאים גם תחום המדידה של המגבר הנוכחי דגימה להימנע הצפת תצוגה בטמפרטורות נמוכות.
- Re-למקד את אלומת האלקטרונים לאחר שהגיע לטמפרטורת היעד.
- רשום את התמונות EBIC. הזן שם ופרמטרים של כל תמונה לתוך קובץ היומן.
- כבו את HV של אלומת אלקטרונים ולסגור את שסתום תא טור SEM לפני לשינוי הטמפרטורה מדגם ידי הזנת ערך גבוה יותר של טמפרטורת היעד לתוך בקר טמפרטורה לחקירות EBIC תלוי בטמפרטורה. פתח את שסתום תא טור SEM ולעבור על HV כאשר te היעד החדשmperature הוא הגיע ואת ואקום המערכת יציב שוב.
- כבו את HV של אלומת אלקטרונים, לסגור את שסתום תא טור SEM ולהפעיל את נוהל החימום לאחר שסיים את המידות EBIC המתוכנן בטמפרטורות נמוכות.
- הסר את ההתקנים וכלים נוספים אשר הורכבו לניסוי קריו-EBIC מבלי לפתוח את תא SEM.
- השאירו את תא SEM סגור במשך 12 שעות לפחות. בדוק כדי להבטיח את הטמפרטורה של בעל המדגם היא ב RT. אחרת, לחמם את בעל מדגם RT לפני פתיחת תא SEM.
- הסר את המדגם משלב ולפנות את תא SEM.
6. ניסויים ccEBSD Performing
- הר המדגם מתוך סגן קטן או על הסיכה של בעל מדגם כי הוא מראש מוטה בטווח בין 65 מעלות ו 70 מעלות ביחס לכיוון אלומת אלקטרונים.
- לחלופין, מניחים את המדגם על הבמה 6 ציר eucentric ב SEM ולהטות אתבשלב שלם כדי שניתן יהיה שטח המדגם נורמלי בכיוון אלומת אלקטרונים הם בזווית בטווח בין 65 מעלות ו 70 מעלות. ודא כי השלב לא מתנגש עם גלאי קירות החדר.
- לפנות את תא SEM עד שסתום תא טור פותח. הגדר את הערכים המתאימים של פרמטרי הדמית SEM HV (20 ק), צמצם (120 מיקרומטר), מצב הנוכחי גבוה, מהירות סריקה (למשל., 5), גדלה (למשל., 3000) והפחתת רעש (ממוצע פיקסל).
- פוקוס אלומת האלקטרונים על פני שטח המדגם ב WD בטווח בין 12 ל 22 מ"מ.
- כבה את מתח האצת אלומת אלקטרונים ולסגור את שסתום תא טור.
- הפעל את אספקת החשמל של גלאי EBSD. הזז את גלאי EBSD מעמדת החנייה נמדדים מצבה בתא SEM.
- פתח את שסתום תא טור ולעבור על מתח האצה אלומת אלקטרונים. Re-למקד את אלומת אלקטרונים על אזור שלעניין על פני השטח המדגמים.
- פתח את תוכנת בקרת EBSD ולטעון את קובץ כיול עבור WD הנבחר.
- הגדר את מדידת תוכנות שליטת EBSD פי הוראות ההפעלה.
- בצעו את רכישת רקע בהתאם למדריך ההפעלה EBSD.
- הקריא לי את המיקום של מרכז דפוס EBSD ומרחק הגלאי עבור WD נבחר מתוך תוכנות שליטת EBSD.
- פוקוס אלומת אלקטרונים באזור של המדגם סמוך לאזור של עניין עבור מדידות בפועל. השאירו את הקורה כדי לסרוק שם בערך שעה 1 לייצוב.
- בדוק את כמות סחף קרן אשר לא תעלה על יותר מ 1 מיקרומטר במהלך מדידת EBSD כולו.
- נווט אלומת אלקטרונים אל האזור של עניין מחדש פוקוס.
- קו לתזמן סריקות מקביל לציר להטות באזור של עניין. השתמש מיפוי הקרן (לא שלב מיפוי) הגדרה. בחר ערכים מתאימים עבור מספר היםteps (למשל., 100), גודל צעד (למשל., 50 ננומטר), זמן חשיפה (למשל., 43 msec), ממוצע מסגרת (למשל., 10) ו binning גלאי (למשל., 2 x 2).
- הקפד לבחור "שמור את כל התמונות". שבת לאינדקס כדי לזרז את המדידה.
- הפעל את סריקות הקו עד הסריקה האחרונה הוא סיים.
- כבה את מתח האצת אלומת אלקטרונים ולסגור את שסתום תא טור.
- לחזור בו גלאי EBSD מעמדת המדידה להחנות עמדה לכבות את יחידת בקרת EBSD.
- Vent התא, להסיר את המדגם ולפנות.
7. ניתוח של נתוני CL:
- בדוק את כיול צורם על ידי השוואת עמדות ספקטרלי של קווים ספקטרליים ידוע (למשל, פסגות קווי הארה של מדגם הבדיקה GaAs בתפזורת unstrained עם נתונים בספרות) ולשנות את כיול גל במידת הצורך.
- תקן את ספקטרום CL רשם (int ensity לעומת גל) ביחס הרגישות תלויה באורך הגל של המערכת האופטית מורכבת Blaze הצורמת PMT ידי חלוקת העוצמת נמדדת על ידי הערך הרגיש המקביל בכל נקודת מדידה.
- חלץ את הערך האפור של כל פיקסל של תמונת CL ומחשב את הממוצע של הערכים האפורים עבור כל אזור של אינטרס בתמונה, לפחות בקנה המידה של נפח האינטראקציה אלקטרונים במדגם.
- לקבוע את עוצמת CL עבור האזור של עניין מעקום כיול של הערכים האפורים הממוצעים של תמונות CL, בהתאם לעוצמת CL עבור ערכי בהירות והניגודיות נתונים של PMT.
- להעריך את עוצמת CL אומר שאני CL של התמונה CL כולו ואת האות האפל I 0 של הגלאי CL.
- חשב את הניגוד C CL בין אזורים בהירים וכהים המופיעים בתמונה CL ידי המשוואה הבאה:
ד / 53,872 / 53872eq1.jpg "/>
8. ניתוח של נתוני EBIC:
- חלץ את הערך האפור של כל פיקסל של תמונת EBIC ומחשב את הממוצע של הערכים האפורים עבור כל אזור של אינטרס לכמת וריאציות המרחבי של עוצמת EBIC מבחינת ניגוד EBIC.
- קבע את הפרופיל בניגוד EBIC מערכיה האפורים נפתרו מרחבית בשל ג Donolato ו RO בל 18.
- לחשב את השטח השונה של הפרופילים בניגוד EBIC.
- לקבוע פרמטרים פיסיים כגון אורך דיפוזיה ואת מהירות רקומבינציה השטח של נושאי מטען מיעוט מהאזור שונה המחושב של הפרופיל בניגוד EBIC פי הכללים שנתנו Donolato 14.
ניתוח 9. ניסויים ccEBSD
- השתמש "ccEBSD" התוכנה שנכתב ללא צורך במיקור חוץ מתוכנת על ידי פול Chekhonin להערכת דפוסי EBSD המוקלטים.
- בחר appropriatדואר דפוס EBSD כי ישמש דפוס התייחסות מנקודת מדידה כי צריך להיות ממוקם באזור הדגימה הנעדר של זנים.
- החל לפחות 15 אזורים לתפוצה הרחבה של ריבית על הדפוס.
- השתמש הקואורדינטות של מרכז הדפוס ומרחק הגלאים אשר נקבעו על ידי תוכנות שליטת EBSD עבור הערכה הנוספת.
- הזן את שאר הפרמטרים הרלוונטיים עבור הערכה, כלומר., קבועים אלסטיים של חומר מנותח, מספר צעדים בקו לסרוק גודל הצעד, גודל גלאי ופתרונו בפיקסלים, גלאי הדגימה להטות זוויות כמו גם גלאי binning.
- שימוש במסנן מעביר פס במהלך חישוב השינוי הפורה 2 ממדים (המסנן הפנימי של 6 פיקסלים ולסנן חיצוניים של 40 פיקסלים).
- הפעל את תוכנית הערכה.
- קרא את תוצאות מספריות מקובץ הטקסט הערכה "protocol.txt" באמצעות תוכנית גיליון אלקטרוני קונבנציונאלי wתרנגולת החישוב הוא סיים.
תוצאות
התכונות המבניות, חשמליות ואופטיות של פגמים מושטים חומר מוליך למחצה נחקרו על ידי שיטות ניסיוניות שונות מיקרוסקופ האלקטרונים הסורקים. באופן כללי, אפשר לחקור מאפיינים אלה על המדגם הזהה, ועם קצת מאמץ בדבר הכנת המדגם, אפילו על פגם יחיד ברור כמו גבול תבואה או הסדר מקומי של לנקעים. עם זאת, יש לציין כי עקב כך שמוצרי אינטראקציה הספציפיים של אלומת אלקטרונים הראשונית עם החומר המוליך למחצה המשמש לבדיקה של תכונות פיסיקליות פגם, ברזולוציה מרחבית אשר יכול להיות מושגת על ידי CL, חקירות EBIC או ccEBSD שונה אחד מהשני. באיור 1, ציורים סכמטיים ניתנים סט-אפ מתאים של SEM המתאים למדידות CL בטמפרטורות נמוכות (איור 1 א), את המכלול לחקירות EBIC (איור 1B ) וכן את הפריסה של אלמנטי החומרה המרכזיים דרושים (סמ"ק) בדיקות EBSD (תרשים 1C).
כל תוצאות הנציגים הניתנות כאן מתקבלות סיליקון כמו חלון ראווה של חומר מוליך למחצה עם מבנה פסים עקיפים. מבנה להקה זו מעכב את כל מדידות ההארה עקב הסבירות הנמוכה של מעברי קרינה בהשוואת מוליכים למחצה עם מבני פער להקה ישירה. כדי להבין עוצמת הארה מספקת תוצאות סטטיסטיות מובטחות הוא מאתגר. בחלק הבא, הפרוצדורות מתוארות לחקירה לנקעים המושרים על ידי דפורמציה פלסטית וכן מחדש התגבשות שלב נוזלי בגבישים יחידים סיליקון. בנוסף, חקירות על סיליקון דו-קריסטל עם גבולות גרעין טווין גבול תבואת זווית נמוכה מוצגות.
איור 2 א מראה דוגמא של המיצוב ההולם של מדגם על נייר הכסף אינדיום כדי להבטיח איש קשר תרמי טוב לבעל קריו-המדגם שבו הטמפרטורה נמדדת תרמי. זה הוכח בניסוי כי לסיליקון, עובי מדגם של כ -200 עד 500 מיקרומטר הוא גם מתאים חקירות קריו-CL בטמפרטורות עד 5 ספקטרה ק CL ניתנת באיור 2B נמדדו עבור גביש Si יחיד במדינה בתולה , לאחר דפורמציה פלסטית ואחרי חישול נוסף. אלומת אלקטרוני SEM הייתה לרוץ מתח אצת אלומת אלקטרונים של 20 קילו וולט וזרם בדיקה של כ -45 נה במצב הסריקה defocused, שתוצאתה העוצמת CL גבוה בשל דור זוג אלקטרון-חור נפח גדול ( על (450 x 250 x 3) מיקרומטר 3) עם צפיפות עירור מתונה. במצב סריקה זו, שטח המדגם הוא למעשה על מ"מ WD = 15 אבל אלקטרוני WD = 0 מותאמת. עבור CL הדמיה, כמובן, אלומת האלקטרונים צריכה להיות ממוקדת אשר מניבה קוטר נקודה של אלומת אלקטרונים על פני שטח המדגם של כמה ננומטר אבל עם אותו עומק החדירה של כמה מיקרומטר עבור האלקטרונים הראשוניים במצב הסריקה defocused. שעת הרכישה לכל תמונה עם רזולוצית חנות של 1,024 x 768 פיקסלים הייתה כ -10 דקות במצב מיצוע פיקסל במהירות סריקת 14 של אלומת האלקטרונים. זה היה מחושב ניסוי אשר כי עבור מצב סריקת defocused הטמפרטורה של האזור המדגם תחת החקירה הוא גדל לא יותר מאשר כמה 0.1 K ידי העברת אנרגית חום רב בגלל אלומת האלקטרונים. במצב הממוקד, חימום המדגם המקומי מאוד תלוי מוליכות התרמית אשר בתורו תלוי סימום המדגם והטמפרטורה עצם 20. עבור אזור לצוף גדל מדגם סי, p-מסוממים עם בורון בריכוז של 10 15 ס"מ -3, במצב סריקה ממוקדת, ΔT העלאת הטמפרטורה המקומית שלכ -2 K התרחש בטמפרטורה cryostat 5 K, ושל ΔT ≈ 0.3 K ב 25 K.
כדי לחקור את התכונות האופטיות של לנקעים, מדגם סי בתפזורת היה נתון דפורמציה פלסטית בלחץ של 16 מגפ"ס ב 800 ° C ואחריו צעד עיוות שני ב 295 מגפ"ס ב 420 מעלות צלזיוס. הקווים התלושים, שמוצגים באיור 2C על פני השטח של חלק המדגם המעווה, נגרמים על ידי תהליכי Glide נקע בשני מישורים תלושים שונים 111 מוכווני. הקווים התלושים ניתן דמיינו ידי אלקטרוני backscattered (BSE). הקווים התלושים לציין את העקבות של המטוסים סורג שעליו רוב לנקעים מיושרים. CL מונוכרומטי (מונה-CL) תמונות (2D דמויות 2E) נרכשו על עמדות אנרגטיות של להקות הארת D4 ו- D3 ואינו סובלות באופן משמעותי מפרופיל טופוגרפית משטח שנגרם על ידי קווי תלוש. זה אומת על ידי חקירות CLחרה ליטוש משטח זהיר שהראה אותו דפוס פס הארה ללא שינוי כמעט כמו על פני שטח המדגם הגליים במקור, שבו דפוסי פס עוצמת CL מקבילים עקבות המטוס התלוש. אם הוא מתוכנן לנתח את ההתפלגות המקומית של עוצמת הארת CL כמותית מהתמונה, ואז תמונת CL יש שתירשם בטווח ליניארי של היחס בין אות CL וערך אפור. יחס זה יכול להיקבע באופן ניסיוני על ידי מדידת קורלציה בין ערך תמונה אפור אות המוחלטת של המכפיל בערכים הניגודיות ובהירים שניתנו הגלאי. להיפך, אם היא נועדה כדי להמחיש וריאציות קטנות של עוצמת CL על פני השטח מדגם, אז עבור התוצאות הטובות ביותר, יחס ערך שאינו ליניארי אות אפור יש להחיל כבר במהלך תהליך ההדמיה SEM. הרזולוציה המרחבית של התמונה CL על מדגם סי בתפזורת בטמפרטורות נמוכות נקבעת על ידי גודל של האינטראקציהנפח של האלקטרונים העיקריים במדגם, בגלל גודלו של נפח האינטראקציה הזו הוא רק קטן יותר באופן שולי מההיקף עבור רקומבינציה הקרינה של הזוגות-חור אלקטרונים 21. הקוטר של נפח האינטראקציה עבור קרן ממוקדת ונייחת הוא כ -3 מיקרומטר תחת תנאי ניסוי הנתונים 22.
האמיד בתחום המתח סביב פגמים מוגברים שיש ccEBSD דורש ההקלטה של דפוסי קיקוצ'י עם איכות מספיק אפילו על אזורי מדגם מתוחים מאוד. דוגמה ניתנת באיור 3 א. כדי לקבל את הדפוסים הללו, פני שטח המדגם צריך להיות חופשיים של שכבות חיצוניות לא רצויות (תחמוצות, זיהום פחמן, וכו '.). תוצאות טובות ניתן להשיג עם הפרמטרים של הניסוי הבא: אלומת אלקטרונים ב 20 קאב 12 Na, הטיה של שטח המדגם נורמלי בין 60 ° ו -70 ° אל קורה תקרית WD = 15 מ"מ, 2 x 2 EBSD Detebinning פיקסל ctor אשר מניב ברזולוציה של 672 x 512 פיקסלים, הגברת רווח של האות התואמת לאיזור זמן גבוה, חשיפה בין 20 ו -43 מילים-שניות לכל מסגרת על גלאי EBSD, עם ממוצע של מעל חמישה עד עשרה פריימי נקודה ואחסון מדידה של קיקוצ'י דפוס כתמונות לכל נקודת מדידה ללא אינדקס. השעה הרכישה הכולל עבור דפוס אחד קיקוצ'י ניתן לאמוד מרגע החשיפה מוכפל במספר מסגרות ועוד כמה 10 msec בשל הזמן הדרוש למשמרת קרן, הקריא ואחסון. ערך של 50 ננומטר התברר באופן ניסיוני להיות גודל צעד מינימאלי טוב בין שתי עמדות מדגמות בתוך מיפוי EBSD. זה עולה בקנה אחד עם שיקולי תיאורטיים אחרונים 23 בדבר החלטת השגה עבור בניגוד התאבכות אלקטרונים. כדי להימנע קרן להיסחף במהלך מיפוי EBSD, מומלץ להמתין לפחות 15 דקות עם הסריקה הקורית בשכונה המיידית של האזור של עניין לפני הפעלת המפה.נמצא כי קו EBSD רק סורק במקביל מדגם ציר הטיה לספק נתוני זן מציאותיים עם דפוס התייחסות באותה השורה. אחרת, קביעה מאוד זהיר של זווית הטיה המדגם בפועל יש צורך, או לחילופין את אורך קו לסרוק בניצב לציר הטיה חייב להיות מוגבל כמה מיקרומטר.
דפוס קיקוצ'י מאוחסן 8 סיביות תמונות JPEG הוערכו על ידי טרנספורמציה פורייה (FT) ו חוצה קשר עם תוכנית "ccEBSD" שנכתב על ידי אחד מחברי (PC). התכנית מבוססת על אלגוריתם שפותח על ידי ווילקינסון et.al. 6, מתואר בפירוט נ"צ. .19 דפוס Kikuchi, מספר (15 - 19) דפוסים קטנים (128 x 128 פיקסלים) צריכים להיות מוגדרים עם תכונות אופייניות כמו מעברי להקה בהירים (3A הדמוי השווה ו 3B). כל תת-הדפוסים צריכים להיות מנותחים על ידי FT. מסנן מעביר פס צריך להיות מיושם על כל התמונות FT (pi הפנימי רדיוס 6xels לתדרים נמוכים, רדיוס חיצוני 40 פיקסלים עבור תדרים גבוהים) להגדיר את כל הערכים לאפס מחוץ לעבור סינון להקה במרחב הפורה (איור 3 ג ע"ע). ואז-מתאם הצלב (סמ"ק) פונקציה (איור 3D) יש לחשב בין FT של כל-דפוס תת עם FT בהתאמה של תת-דפוס (3E דמויות 3F) מהתבנית קיקוצ'י התייחסות. מהעמדות של הפסגות-פונקציות סמ"ק (איור 3D), ההתקות היחסיות של הדפוסים תת ניתן לקבוע. באמצעות התקות אלה, המרכיבים זן נורמלי גזירה ניתן לחשב. אם קבוע אלסטית תלוי חומר ידוע, גם מרכיבי הלחץ ניתן לקבוע. ב הכיתוב וויגט, קבועים אלה הם C 11 = 165.7 GPA, C 12 = 63.9-GPA ו- C 44 = 79.9-GPA עבור Si עם סריג מעוקב 24. השילוב של תוצאות מכל דפוסי המשנה של אחד קיקוצ'י pattern משפר את הדיוק של הערכת הזן. השגיאה הסטטיסטית נקבעה מסריקת קו ccEBSD על אזור חופשי פגם בגביש סיליקון יחיד תימצא 2 x 10 -4 עבור כל הרכיבים מותחים זן. אף על פי כן, כדי להשיג תוצאות כמותיים במקרה של פגמים מורחבים, הבחירה של דפוס קיקוצ'י כמו דפוס התייחסות היא חשובה. אם, למשל, המדגם הוא מכוסה לחלוטין על ידי לנקעים כפי שמוצג באיור 2, נהלים מתוחכם כי הם המוצע על ידי ג'יאנג et al. 25 יכול להיות מיושם כדי לגלות את דפוס ההתייחסות המתאימה.
המצב לשימוש ccEBSD קל יותר רקיק Si ([001] אוריינטציה -surface) מטופלים על ידי אלומת אלקטרונים בעלי אנרגיה גבוהה כדי לעורר מחדש התגבשות שלב נוזלי (ראה איור 4). סביב המסלול של התגבשות מחדש, קווי תלוש גלויים בתמונה BSE מה שמעיד על dislתנועת יקום קורס במטוסים להחליק עם עקבות במקביל קצות התמונה (איור 4 א). חקירות CL בוצעו באותם תנאים ניסיוניים כמו למדגם המעווה plastically. התמונות מונו-CL, רשמו בבית האנרגיות של מעבר להקה אל להקה של להקות הארת נקע D4 ו- D2 (איורי 4B, 4C ו 4D, בהתאמה), להראות את הפריסה המרחבית של הפגמים המורחבים הנגרמת על ידי מחדש הליך -crystallization. אנטי-קורלציה מקומי בין מעבר להקה אל להקה ואת להקות הארת קו D ניתן להסיק מהתמונות מונו-CL. זו נתמכת על ידי ספקטרום CL (איור 4E) אשר נמדדו עמדות מדגם 1, 2 ו -3 (איור 4 א ע"ע) במצב ספוט של אלומת אלקטרונים. מהתחקירים ccEBSD ביצע בתור קו סריקה מול המסלול מחדש התגבשות (הקו הלבן באיור 4 א), טנזור המקומי זן components לאורך קו הסריקה ניתן לקבוע (איורים 4F ו 4G). הוכח, כי בטווח הטעות הסטטיסטית, הערכים אינם תלויים אשר בפרט דפוס קיקוצ'י שימש דפוס הפניה אם הדפוס הזה ממוקם באזור שבו המעבר הלהקה אל הלהקה הוא דומיננטי. המעברים האלקטרוניים הקשורים הנקע המופיעות כאשר הסכום נורמלי זני Tr (ε) עולה על ערך של 5 x 10 -4. בגלל Tr (ε) אינו שווה לאפס עבור הסריקה באזור של כ -150 מיקרומטר אורך קרוב המסלול מחדש התגבשות, ישנה התרחבות סריג ממוצעת בנפח ליד אל פני השטח מדגם. על פי התאוריה של אלסטיות ליניארית, המתח הרגיל σ 33 שווה לאפס ככל presupposed בתכנית ההערכה "ccEBSD". אם יש סדק על קו הסריקה EBSD, אז הערכת ccEBSD לא יכולה להתבצע על הסריקה השלמה עם דפוס התייחסות אחת בשל וריאציות הפתאומיות של דפוס קיקוצ'י קאוsed על ידי התופעות הגיאומטריות של הסדק.
מה יכול להיות מושגת באופן עקרוני על ידי השיטות הניסיוניות תארו לחקירת תכונות מבניות, אופטיות וחשמליות של גבולות תבואה ב Si מוצג באיור 5 עבור סימום Si דו-גביש של p-סוג עם ריכוז בורון של 10 17 סנטימטרים -3. מפת EBSD הקונבנציונלית מניבה את המידע מלא על האורינטציה קריסטל בכל נקודה של המפה שבו רק לאינדקס של דפוס קיקוצ'י מבוצע מייד לאחר רכישת הדפוס ידי תוכנת הרכישה. בנוסף, גם את סוג גבולות תבואה יכול להיות מוצג על ידי נתוני EBSD הקונבנציונליים ניהול התכנית (איור 5 א). לצורך זיהוי של LAGB, זווית קריטית יש שהוגדרה עבור misorientation של הסריג הגבישי בשתי נקודות מדידה סמוכות. ערך מינימלי של 1 ° הוכח להיות מתאים. בשביל הLAGB מצוין במפת EBSD, זווית misorientation היא 4.5 מעלות. הדימוי-EBIC של אותו אזור המדגם (איור 5) נמדד ב RT. גבולות הגרעין Σ3 המבולבלים ואת LAGB מופיעים כאן בתור קווים כהים. השפעה זו נגרמת על ידי רקומבינציה המוביל גדל באופן מקומי. מהפרופיל הניגודיות של האות EBIC ברחבי LAGB (השוו, איור 5H), אורך דיפוזיה של (60 ± 12) מיקרומטר מהירות רקומבינציה של (4.1 ± 0.4) x 10 4 ס"מ שניות -1 נקבעו נושאי מטען מיעוט במסגרת המודל ידי Donolato 14. הנקודות הכהות היחידות בתמונת EBIC, המפוזרים על פני שטח המדגם כולו המרוכזות במיוחד בקרבת LAGB, מציינות את המיקומים של לנקעי שחלה. בחקירות הדמיה CL ב 4 K, LAGB מופיע כהה בתמונה מונו-CL באנרגיות המעבר הלהקה אל הלהקה (איור 5 ג), כצפוי, אבל surprisingly גם תמונת מונו-CL באנרגיה של הלהקה D4 (איור 4D) אשר בדרך כלל מוקצה לנקעים. עם זאת, LAGB נראה בהיר בתמונה מונו-CL באורך גל של 1,530 ננומטר המתאים להקות הארה D1 / D2 (איור 5E). התנהגות הארה זה היא האמין להיגרם על ידי פגמי נקודות בשכונה לנקעים המהווים את LAGB. בנוסף, הליך ccEBSD בוצע כקו לסרוק ברחבי LAGB לקבוע שדה הזן המקומי שלה. מתח ההאצה אלומת אלקטרונים הופחת ל -10 קילו כדי להגדיל את הרזולוציה המרחבית לקביעת זן על חשבון זמן הרכישה הכולל גדל עבור כל תבנית קיקוצ'י. הנורמלים ואת גזירת רכיבי הזן, שמוצגים דמויות 5F ו 5G, בהתאמה, לא ניתן לחשב עבור האזור במרכז LAGB (מעל כ -50 ננומטר) כי דפוסים כפולים להופיע המונעים ניתוח דפוסי קיקוצ'י. יותרמעל, דפוסי EBSD משני צידי LAGB צריכים להיות מתואמים עם שתי תבניות התייחסות שונות כי השיטה-מתאם הצלב יכולה להיות מיושמת רק עבור וריאציות קטנות של התבנית העקיפה. אז, שתי תבניות התייחסות נאספו בצד שמאל ובצד ימין של LAGB בשל זווית misorientation הגדולה בין שני-דגני המשנה. אף על פי כן, זה מרגש כי רכיבי הזן להתנהג באופן סימטרי משני צדי LAGB. התרשימים עבור תלות עמדת רכיבי הזן מראים כי בטווח של שדה הזן של LAGB משתרע על כ -350 ננומטר לתתי-דגני שניהם. תהפוך הוא, בתרשים של הניגוד משתנה מקומית במעבר להקה אל להקת התמונה מונה-CL, ושל ניגוד אות EBIC בתמונת EBIC (5H איור), עולה כי השפעת LAGB על אות ההארה ועל אות EBIC נע עד ± 10 מיקרומטר ו ± 1.5 מיקרומטר מהמרכז של LAGB, בהתאמה. זו מאמתת את ההצהרה מההתחלה כי ההחלטה המקומית לחקירת מאפיינים השונים של פגמים המורחבת מאוד תלויה בשיטה ופרמטרים הניסיוניות מיושמת.

איור 1. הגדרת עבור CL, מדידות EBIC ו ccEBSD. (א) SEM עם אקדח פליטת שדה, פתחים שונים הדמיה וניתוח, המדגם על בעל קריו-המדגם, במראה CL איסוף האור, monochromator ואת IR-PMT עבור אור אינפרא אדום, (ב) קשר שוטקי של המדגם לחקירות EBIC ו- (ג) הגדרת להיווצרות ואחסון של דפוס קיקוצ'י אשר ניתן לנתח מספרית כדי לקבל מידע על כיוון קריסטל וכן על עיוותים הגבישי ידי ccEBSD.ד / 53,872 / 53872fig1large.jpg "target =" _ blank "> לחץ כאן כדי לצפות בגרסה גדולה יותר של דמות זו.
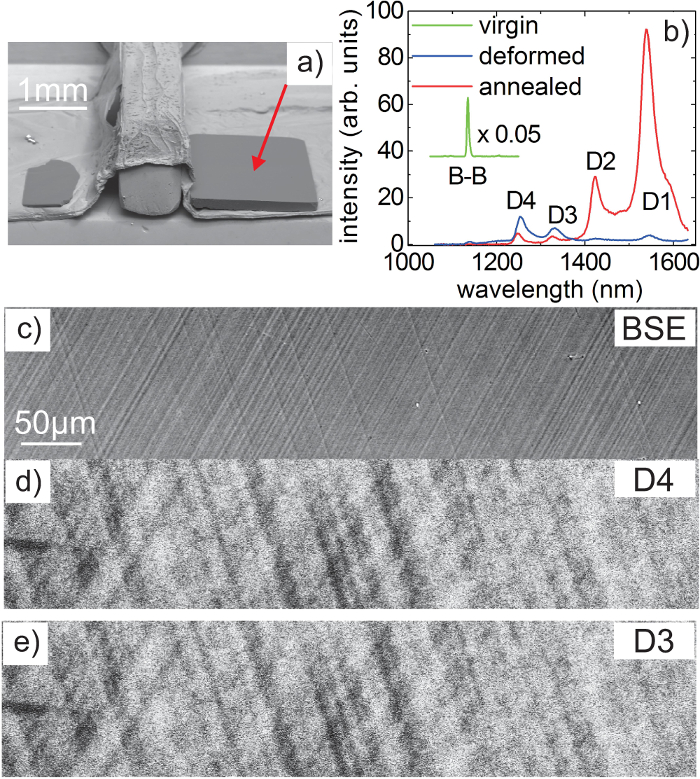
איור 2. CL ספקטרלית וחקירות הדמיה על הסיליקון plastically המעווה יחיד קריסטל. (א) דגימות הסיליקון על רדיד אינדיום ממוקם על בעל קריו-מדגם. (ב) ספקטרה-CL נמדדה עבור גביש יחיד גבוהה טוהר Si (בתולה), למדגם מעווה plastically, ואחרי חישול נוסף. מעברי המאפיין בספקטרום מסומנים כרגיל עם BB למעבר להקה אל להקה, ו- D1 כדי D4 עבור להקות הארת מושרה עקירה. (C) Slip קווים על פני השטח של גביש Si המעווה (מסומנים בחץ אדום איור 2 א) צלם ע"י אלקטרוני גב מפוזר (BSE). תוצאות אלו מראות דפורמציה פלסטית עבור syste תלוש שונהגברת. איורים 2 ד ו 2E, התמונות-CL מונו עבור הקו D4 וקו D3 נראים לעין, בהתאמה, עם כל נמדדו באזור מדגם זהה מתחת לזה שאתה רואה אותו בתמונה-BSE (איור 2 ג). אנא לחץ כאן כדי להציג גרסה גדולה יותר של דמות זו.

תמונות איור 3. חזותי שלבים במהלך ccEBSD הניתוח. (א) דפוס מלא קיקוצ'י מעמדה מדגמת בפועל עם-דפוס משנה. (ב) אחד-הדפוסים תת ו- (ג) השינוי הפורה המסונן שלה. (E) The-הדפוס תת המקביל מעמדת הפניה על המדגם (F) טרנספורמציה הפורה המסוננת שלה. (ד) הפונקציה חוצה קשר (CCF) שנמדד-טרנספורמציות הפורה של-דפוס המשנה. הבהירות של מרכז התרבות הצרפתית הוגדלה ב -20% כדי להמחיש את הפרטים. אנא לחץ כאן כדי לצפות בגרסה גדולה יותר של דמות זו.
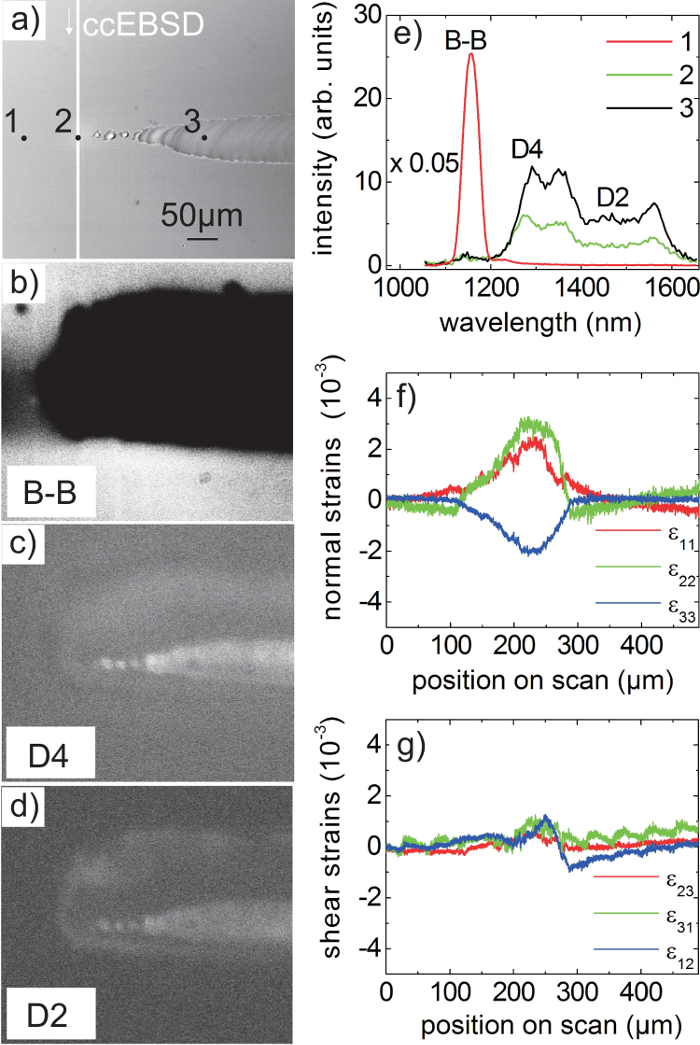
איור 4. CL ו ccEBSD חקירות עבור Si וופל לאחר בדיקה חוזרת של התגבשות. (א) התמונה BSE מפני השטח של Si רקיק עם מסלול של חומר-התגבשו מחדש לאחר טיפול על ידי אלומת אלקטרונים בעלי אנרגיה גבוהה. פוזיציות של כתמים 1, 2 ו -3 עבור חקירות רפאים CL מסומנים כמו גם בקנה אחד עם חץ לכיוון שבו הסריקה ccEBSD בוצע. (BD) תמונות מונו-CL של האזור המדגם שמוצג (א), נלקחו ב העמדות האנרגטיות של להקה אל להקה המעברת (B),D4 (C) ו- D2 (D) להקת הארה. (E) CL ספקטרום נמדד בנקודות 1, 2 ו 3. הרגיל (F) ומרכיבי זן גזירה (G) לאורך הקו לסרוק ב (א), כפי שנמדד חקירות ccEBSD. אנא לחץ כאן כדי לצפות בגרסה גדולה יותר של נתון זה.

EBSD איור 5., EBIC, CL ו ccEBSD חקירות על גביש דו-הסיליקון עם HAGBs ו LAGB. (א) מפת EBSD אוריינטציה על גביש דו סי עם גבולות הגרעין התאומים צהוב LAGB בשחור. האוריינטציה של הרגיל של משטח דגנים מצוין. (ב) תמונה EBIC ב RT של אזור הדגימה ב (א) שבו קוהרנטי (חץ צהוב) ו incohereNT (חץ כחול) גבולות גרעין תאום מסומנים. (CE) התמונות מונו-CL באנרגיות של BB (C), D4 (ד) ו D1 / D2 (E) שייכים לאזור LAGB המתאפיינת מלבן אדום בתמונה EBIC (B). נורמלי (F) ומרכיבי זן גזירה (G) שנמדדים חקירות ccEBSD ברחבי LAGB. (ח) השוואה בין הניגוד נמצא בתמונה מונו-CL BB ב 4k ו בתמונה EBIC ב RT ברחבי LAGB. שימו לב את קנה המידה שונה על x-ויתאמו דיאגרמות רכיב לכאביה בתרשים Cl- ו EBIC ניגודיות. אנא לחץ כאן כדי לצפות בגרסה גדולה יותר של דמות זו.
Discussion
מיקרוסקופ אלקטרונים סורק מציעה את האפשרות לאתר פגמים המורחבת בחומר מוליכים למחצה וכן לאפיין תכונות מבניות, אופטיים החשמל שלהם על ידי יישום של ccEBSD, חקירות CL ו EBIC. באופן כללי, לא ניתן לבצע את כל שלוש השיטות בו זמנית על אותו המדגם. עם זאת, שילוב של תוצאות שהושג על ידי שיטות חקירת משלימות השונות, כאשר היא מבוצעת ברצף הגיוני, מוביל להבנה עמוקה יותר של הטבע הפיזי של התופעות שנגרמו על ידי פגמים מורחבים.
עבור מדידות CL נותנים מידע על התכונות האופטיות של פגמים מורחבים, שלב קריטי הפרוטוקול הוא הליך מיצוב מדגם (שלב 1.6) בשל חישול רצוי של פגמים במדגם במהלך החימום של רדיד אינדיום (מבטיחה טובה קשר תרמי חשמל של המדגם עם בעל המדגם). חלופה לנוהל המוצעהוא לעגן את המדגם על בעל המדגם ידי דבק כסף מוליך ב RT. עם זאת, מניסיון זה ידוע כי הממס האורגני דבק יכול לגרום לזיהום פחמן על פני השטח המדגמים במהלך סריקת SEM. הזיהום מדרדר את איכות תמונות CL וכן של דפוסי עקיפת EBSD. בנוסף, הצעד 4.21 דורש תשומת לב מיוחדת, שבה עלייה פתאומית של עוצמת ההארה של סיליקון יכולה להתרחש במהלך למטה-הקירור של המדגם. זה יכול לפגוע בביצועים של המכפיל. להיפך, במקרה של עוצמת הארה נמוכה בלתי צפויות על המדגם בפועל, אחד צריך לנסות לשפר את ההתאמה של אספקלריה מאירה-איסוף (מס 'פרוטוקול 4.23) משום יישור במראה ראשוני בוצע על מדגם הבדיקה ב RT מגוון של גל שונה במקצת.
בדבר מגבלות אינסטרומנטלי של השיטה, יש לקחת בחשבון כי ב לטמפרטורות נמוכות מאודures הבמה עם המדגם ניתן להעביר רק על ידי ± 5 מ"מ x ו- y-כיוונים המגביל את האזור של דגימות תחת חקירה. מגבלה זו היא בשל הסכנה של שבר פריך של הצינור להעברת הוא. הממדים המדגמים-ניסויי קריו הנתונים 1.1 ו -1.2 מוגבלים גם על ידי תנאי ניסוי. אז שטח הפנים של הדגימות צריך להיות מותאם לגודל של בעל המדגם כדי להבטיח מגע תרמי אופטימלי על גוף הקירור. העובי המומלץ הנמוך של דגימות סיליקון מגביל את שיפוע הטמפרטורה במדגם עבור-ניסויי קריו. עבור עובי מדגם של 200 מיקרומטר, הטמפרטורה במרכז נפח האינטראקציה עבור האלקטרונים העיקריים באזור השטח נמצאה להיות מוגברת על ידי פחות מ -5 K בהשוואת הטמפרטורה הנמדדת על פני השטח של בעל המדגם. מהירות סריקה גבוהה ואת בהגדלה נמוכה המוצע רק עבור ההליך מגניב למטה בצעדים 4.5 ו 4.17, להבטיח כי ההאזור של עניין e נשמר נקי. הסיבה לכך היא של העברת החום על ידי קרן האלקטרונים הסורקת אשר שומרת על טמפרטורה תמיד מעט מעל הטמפרטורה של שאר האזורים המדגמים אשר פועלים כמו מלכודת עיבוי גז שיורית בתא SEM. באופן כללי, כל הפרמטרים מפורטים בשלב 4.24 עבור ספקטרוסקופיה CL מותאמים למכשיר המדידה של הארת קו שנקראת D בסיליקון בתפזורת על ידי ניסיוני להגדיר לפי רשימת הציוד. הפרמטרים צריכים להיות מותאמים אם חקירות של ההארה הן להתבצע על חומרים מוליכים למחצה אחרים.
המבקר של מגוון האנרגיה של הארה ציין, מגבלה נוספת של תוצאות המדידות CL מהמראה-איסוף האור כי האור המגיע תהליכי רקומבינציה קרינה בהיקף רקומבינציה כולו נאסף על ידי המראה ובכך קובע את השווי אפור של המקביל התמונה פיקסל CL שהוא להקצותed למצב של אלומת אלקטרונים על פני השטח המדגמים. משום בקוטר של נפח רקומבינציה (אשר ניתן להשוות את עוצמת קול העירור) הוא גדול יותר מגודל פיקסל אפילו בהגדלה נמוכה, השפעה זו גורמת מריחות המרחבי של אות ההארה, ועל כן, מגבילה את הרזולוציה המרחבית. עם זאת, חקירת CL מאפשרת הדמיה של ההפצה המקומית של הארה מונתה או רָגִישׁ לְכָל הַצבָעִים עם רזולוציה ספקטרלית בינונית וניתן לשלבו עם חקירות photoluminescence לתת רזולוציה ספקטרלית גבוהה. לאחרונה, כשיטת ניסיוני אלטרנטיבת CL מדידות, מיפוי מיקרוסקופי ספקטרוסקופיות של photoluminescence הקשורים נקע הוצע על ידי הקבוצה של טאג'ימה ועמיתים לעבודה 26. הרזולוציה המרחבית של מיפוי photoluminescence נמוכה בבירור מאשר תמונות CL, אבל חקירות photoluminescence בנוסף מאפשרות הקיטוב של קור להקת פליטה העמוקה ברמהlated לנקעים שייקבעו LAGBs עם מבנים טוויסט וההטיה 27,28.
במקרה של חקירות EBIC, אשר נותנות תובנה התכונות החשמליות של פגמים מורחבים, אין שיטות חלופיות עבור ההדמיה של יעילות תשלום האיסוף משתנית מקומית חומרים מוליכים למחצה עם רזולוציה מרחבית וזהובה. עם זאת, גם למדידות EBIC, שלבים קריטיים כלולים בפרוטוקול. אז בשלב 5.13, הווריאציה של תמונת EBIC עם טמפרטורה יורדת צפויה לנבוע מאפיינים התלויים בטמפרטורה של הפגמים המורחבים. עם זאת, איכות המגעים יכול לשנות בטמפרטורות מתחת RT ומכאן להשפיע על התמונה EBIC. טמפרטורה משפיעה על קשר שוטקי, עשה עם שכבה מתאימה של אל במקרה של p-סוג ועם Au במקרה של סיליקון מסוג n, בגלל המקדמים השונים של התפשטות תרמית הפרדת שכבת המגע מן סיליקוןמצע n. יתר על כן, מגע ohmic שנעשה על ידי eutectic גליום-אינדיום אינו יציב בטמפרטורות מתחת 160 ק בדרך כלל, הירידה של איכות הקשר מובילה חזק ירד אות EBIC עבור שטחים גדולים. במקרה זה, המגעים צריכים להתחדש. עבור חקירות EBIC ב RT, זה גם מתקבל על הדעת כי המגעים למדידות EBSD יכולים להתבצע על ידי מליטת המדגם אל לוח נישא מתאים. הגבלת אינסטרומנטלי נוספת של מדידות EBIC נגרמת על ידי הבולט של בעלי קצה המגע מעל פני השטח המדגמים. כדי למנוע התנגשות בין בעל מגע הקצה ועל חתיכת המוט של SEM הקל WD צריך להיות לפחות 15 מ"מ.
בהליך הניסיוני לחקירות ccEBSD אשר ניתן להשתמש בם כדי להעריך את שדה הזן ארוך טווח של פגמים מורחבים, השלבים הבאים הם קריטיים. החלק המאתגר ביותר של הניסוי הוא הכנת המדגם, ובעיקר הליך הליטוש האחרון (עמ 'rotocol מס 3.1) אשר צריך להתבצע בזהירות, כדי למנוע את הדור של ליקויים במשטח נוספים. אם לא נכרת מגמת קיקוצ'י ניתן להשיג, לעתים קרובות את האיכות של שטח המדגם אינה מספיק. עם זאת, מן גבישים יחידים סיליקון עם קווים להחליק על פני השטח לאחר דפורמציה פלסטית, תבנית עקיפה טובה יכולה להיות מושגת שהיה גם מתאים הליך ערכת ccEBSD. חספוס פני השטח של דגימות אלה נותח על ידי מיקרוסקופ כוח אטומי מניב וריאציה גובה בטווח של עד 500 ננומטר. לכן, זנים פנימיים גבוהים מאוד או שכבות משטח אמורפי נראים אחראי דפוסי עקיפה מטושטשים ולא חלקות המושלמות של השטח המדגם. נקודה נוספת יכולה להיות אות נמוכה מן האלקטרונים המפוזרים באופן קוהרנטי בהשוואה לרקע. אז עלייה של זרם הבדיקה במתח אץ מתמיד ו / או קביעה מדויקת יותר של אות הרקע (שלב פרוטוקול מס '6.12) אמחדש מועיל. כדי למזער את התנועה מדגמת במהלך מדידת ccEBSD לטווח ארוך מומלץ לתקן המדגם מכאני (מס 'פרוטוקול 3.2).
מגבלות אינסטרומנטלי עבור חקירות ccEBSD יכול להיווצר אם ההטיה של יחסי השטח מדגם אל אלומת אלקטרונים האירוע מתממשת על ידי הטיה של הבמה. ישנם ואז הגבלות חזקות לתנועת מהמדגם בשל סיכון התנגשות עם חתיכת המוט והקירות הקאמריים. יתר על כן, מומלץ מאוד להשתמש סריקות קו רק כי הם מקבילים לציר ההטיה (ולכן נראה אופקי על מסך SEM), כי, תחילה, סריקות אנכיות יש שגיאת סכום גדולה של הזנים הפנימיים עקב השגיאה של מדגם לְהַטוֹת. שנית, במהלך EBSD, הרזולוציה לרוחב גבוה (גורם של כ 3 70 ° הטיה) לאורך ציר הטיה מאשר בניצב לו. הגבול התחתון עבור הערך של הרכיבים המותחים זן שחושב Si מחקירות ccEBSD הוא כ2 x 10 -4 המהווה את השגיאה האקראית. בנוסף יש להדגיש כי טכניקת ccEBSD לא ניתן ליישם בנוכחות סיבובי סריג הגדול (> 4 °) מתייחסים לנקודת ההתייחסות או קרובים מאוד גבולות גרעין, שדפוסי EBSD מדגנים שונים חופפים. המגבלה הפיסית של חקירות ccEBSD בדבר ברזולוציה מרחבית של נחישות הזן בשל המגוון של התאבכות האלקטרונים אשר נמצא כ 50 ננומטר לאורך ציר ההטיה במדגם. לשם השוואה עם ניסויים עקיפים רנטגן לקביעת זנים פנימיים, זהו יתרון ברור בגלל הנפח הגדול יותר באופן משמעותי האינטראקציה של צילומי רנטגן גם במקרה של רנטגן μ-עקיף. עבור חומרים מוליכים למחצה, חקירת הפרעות של מקדם שבירת איזוטרופיים ידי polarscope יכולה להיות מיושמת גם על קביעת לחצים פנימיים, אך הרזולוציה המרחבית של שיטה זו היא נמוכה יותרכמה מאות ננומטר 29. שיטה חלופית לקביעת מדינת הזן תלת ממדים נפתרה מרחבית בגבישים מבוססת על הפיצול של מסדר גבוה אזורים לאואה (הולץ) קווים. לשיטה זו להתבצע מיקרוסקופ אלקטרונים הילוכים (TEM) באמצעות biprism אלקטרונים עבור interferometry אלקטרונים 30. עם זאת, בניגוד חקירות ccEBSD ב SEM, TEM חקירת מחייבת הכנת רדיד מהדגימה שמשנה את הזנים הפנימיים בשל תופעות הרפיה.
במחקרים עתידיים, מדידות ccEBSD גם תבוצענה בטמפרטורות נמוכות. זה יאפשר החקירה התכונות המבניות, אופטיות וחשמליות, לא רק על אותו פגם מורחב, אבל גם באותה הטמפרטורה.
Disclosures
The authors have nothing to disclose.
Acknowledgements
Support of this work by the German Research Foundation (DFG) within the framework of the Research Training Group 1621 is gratefully acknowledged by Paul Chekhonin. All authors are grateful to Dietmar Temmler (Fraunhofer FEP Dresden) for providing the electron beam processed Si samples showing liquid phase re-crystallisation. Special thanks go to Stefan Saager and Jakob Holfeld for the preparation of the figures for the SEM equipment and the EBSD set-up. We thank Michael Stavola for detailed discussions and help with this work.
Materials
| Name | Company | Catalog Number | Comments |
| Cryogenic liquids: | Linde http://www.linde-gas.de, Air Liquide http://www.airliquide.de/ | ||
| Liquid helium ( LHe ) | for cooling of the cryostat | ||
| Liquid nitrogen ( LN2 ) | for cooling of the PMT R5509-73 | ||
| Indium wire | chemPUR http://chempur.de/ | 900898 | CL sample preparation: for good electrical and thermal coupling between cryostat and sample |
| Mica | plano GmbH http://www.plano-em.de/ | V3 | isolation of EBIC sample holder and good thermal coupling to the cryostat |
| Aluminium wire, gold wire | chemPUR http://chempur.de/ | 009013, 900891 | purity 99.99%, material for formation of Schottky contact for EBIC measurements |
| Indium-Gallium eutectic solution | Alfa Aesar | 12478 | to form ohmic contact on the backside of the sample for EBIC measurements |
| Liquid chemicalsVLSI Selectipur (de-ionized water, acetone, ethanol) | VWR | 52182674, 51152090 | for sample preparation: cleaning and surface treatment |
| Hydrofluoric acid | VWR | 1,003,382,500 | necessary to remove surface oxide layer on Silicon samples immediately before investigation; follow safety precautions! |
| MicroCloth | Buehler http://www.buehler.com/ | 40-7222 | polishing cloth |
| MasterMet 1 (0.02 µm) | Buehler http://www.buehler.com/ | 40-6380-006 | SiO2 polishing suspension |
| Scanning electron microscope (SEM) | Carl Zeiss AG http://www.zeiss.de/microscopy/ | Ultra 55 | field emission gun |
| SEM-CL system | EMSystems | customized, following equipment belongs to CL system: | |
| SEM stage for cryostat | Kammrath & Weiss http://www.kammrath-weiss.com | ||
| KONTI cryostat | Cryovac http://www.cryovac.de/ | 3-06-4609C-7674 | cooling of sample |
| Liquid He transfer line for KONTI cryostat | Cryovac http://www.cryovac.de/ | 3-01-3506C-SO | |
| Cryogenic Temperature Controller | Cryovac http://www.cryovac.de/ | TIC-304 MA | controlling the flow rate of cryogenic |
| Photomultiplier Tube (PMT) | Hamamatsu http://www.hamamatsu.com | R5509-73 | for NIR spectral range |
| PMT housing and cooler | Hamamatsu http://www.hamamatsu.com | C9940-2 | |
| HV power supply | Heinzinger electronic GmbH http://www.heinzinger.de/ | LNC 3000-10 neg | for operating of the PMT |
| Monochromator | Sol Instruments Ltd. http://www.solinstruments.com | MS2004i | |
| PMT | Hamamatsu http://www.hamamatsu.com | R3896 | for visible spectral range |
| CCD digital camera | Proscan GmbH, Proscan Special Instruments Ltd. http://www.proscan.de | HS 101 H | for visible spectral range |
| Control program | Proscan GmbH, Proscan Special Instruments Ltd. http://www.proscan.de | PSI line | for controlling spectral CL measurements with CCD or PMT detectors |
| Laptop | Dell | Latitude 110L | hardware for running the control program |
| LHe dewar | cryotherm http://www.cryotherm.de/ | Stratos 100 SL | container for cryogenic |
| LN2 dewar | container for cryogenic | ||
| Protective glasses | pulsafe | protective equipment | |
| Protective gloves | tempex | Protect line Mod. 4081052 | protective equipment |
| Heating tape | Thermocax Isopad GmbH http://www.isopad-solutions.com | IT-TeMS 6 | to prevent or reduce icing of the flexible hoses during cooling |
| Diaphragm pump | Vacuubrand GmbH & Co KG http://www.vacuubrand.com | ME4 | to provide the flow rate of the cryogenic |
| Vacuum accessoires: flexible hoses, seals, locking rings | connectors for cryogenic CL or EBIC set-up | ||
| Specimen current EBIC amplifier | KE developments / Deben http://deben.co.uk/ | Type 31 | Measuring the EBIC current |
| High vacuum chamber with metal evaporation | customized | formation of Schottky contact for EBIC measurements | |
| Heating plate | Retsch GmbH http://www.retsch.de | SG1 | CL sample preparation |
| EBSD detector Nordlys | HKL | no more available; can be replaced by the Oxford EBSD detectors NordlysMax3 or NordlysNano | |
| EBSD acquisition and evaluation software Channel 5 | HKL | no more available; can be replaced by the Oxford EBSD Software AZtecHKL | |
| ccEBSD program ccEBSD_v1.07.exe | in house written program | for use please contact authors | |
| EBSD interface with remote control system | Carl Zeiss AG http://www.zeiss.de/microscopy/ | necessary for the electron beam control and parameter transfer between EBSD system and SEM | |
| Vibromet2 | Buehler, http://www.buehler.com/ | 671635160 | vibratory polisher |
References
- Alexander, H. Chapter 6, Dislocations. Electronic Structure and Properties of Semiconductors. Schröter, E. , Materials Science and Technology; 4. VCH Basel. 249-319 (1991).
- Mahajan, S. Defects in semiconductors and their effects on devices. Acta Mater. 48, 137-149 (2000).
- Holt, D. B., Yacobi, B. G. Extended Defects in Semiconductors- Electronic Properties, Device Effects and Structures. , Cambridge University Press. (2007).
- Hornstra, J. Models of grain boundaries in the diamond lattice. Physica. 25 (1-6), 409-422 (1959).
- Randle, V. Crystallographic characterization of planes in the scanning electron microscope. Mater. Charact. 34 (1), 29-34 (1995).
- Wilkinson, A. J., Meaden, G., Dingley, D. J. High-resolution elastic strain measurement from electron backscatter diffraction patterns: New levels of sensitivity. Ultramicroscopy. 106 (4-5), 307-313 (2006).
- Wilkinson, A. J., Meaden, G., Dingley, D. J. High resolution mapping of strains and rotations using electron backscatter diffraction: New levels of sensitivity. Ultramicroscopy. 106 (4-5), 307-313 (2006).
- Drozdov, N. A., Patrin, A. A., Tkachev, V. D. Recombination radiation on dislocations in silicon. JETP Lett. 23 (11), 597-599 (1976).
- Dean, P. J., Williams, G. M., Blackmore, G. Novel type of optical transition observed in MBE grown CdTe. J Phys. D: Appl. Phys. 17 (11), 2291-2300 (1984).
- Nacke, M., Allardt, M., Chekhonin, P., Hieckmann, E., Skrotzki, W., Weber, J. Investigations on residual strains and the cathodoluminescence and electron beam induced current signal of grain boundaries in silicon. J. Appl. Phys. 115 (16), 163511-1-163511-8 (2014).
- Ikeda, K., Sekiguchi, T., Ito, S., Suezawa, M. EBIC and Cathodoluminescence Study of the Bonded Silicon Wafers. Solid State Phenom. 63-64, 481-488 (1998).
- Sekiguchi, T., Ito, S., Kanai, A. Cathodoluminescence study on the tilt and twist boundaries in bonded silicon wafers. Mater. Sci. Eng. B. 91-92 (4), 244-247 (2002).
- Lee, W., Chen, J., Chen, B., Chang, J., Sekiguchi, T. Cathodoluminescence study of dislocation-related luminescence from small-angle grain boundaries in multicrystalline silicon. Appl. Phys. Lett. 94, 112103(2009).
- Donolato, C. Theory of beam induced current characterization of grain boundaries in polycrystalline solar cells. J. Appl. Phys. 54 (3), 1314-1322 (1983).
- Kittler, M., et al. Regular Dislocation Networks in Silicon as a Tool for Nanostructure Devices used in Optics, Biology, and Electronics. Small. 3 (6), 964-973 (2007).
- Kveder, V., Kittler, M., Schröter, W. Recombination activity of contaminated dislocations in silicon: A model describing electron-beam-induced current contrast behavior. Phys. Rev. B. 63, 115208(2001).
- Higgs, V., Lighthowlers, E. C., Norman, C. E., Kightley, P. Characterisation of dislocations in the presence of transition metal contamination. Mater. Sci. Forum. 83-87, 1309-1314 (1992).
- Donolato, C., Bell, R. O. Characterization of grain boundaries in polycrystalline solar cells using a computerized electron beam induced current system. Rev. Sci. Instrum. 54 (8), 1005-1008 (1983).
- Wilkinson, A. J., Meaden, G., Dingley, D. J. chap. 17, Mapping Strains Using Electron Backscatter Diffraction. Electron Backscatter Diffraction in Material Science. Schwartz, A. J., Kumar, M., Adams, B. L., Field, D. P. , 2nd Edition, Kluwer Academics/Plenum Publishers. New York. 231-249 (2009).
- Childs, G. B., Ericks, L. Y., Powell, R. W. National Bureau of Standards. Thermal Conductivity of Solids at Room Temperature and Below: A Review and Compilation of the Literature. , http://digital.library.unt.edu/ark:/67531/metadc13173/m1/1 (1973).
- Yacobi, B. G., Holt, D. B. Cathodoluminescence Microscopy of Inorganic Solids. , Plenum Press. New York. (1990).
- Everhart, T. E., Hoff, P. H. Determination of Kilovolt Electron Energy Dissipation vs Penetration Distance in Solid Materials. J. Appl. Phys. 42 (13), 5837-5846 (1971).
- Zaefferer, S., Elhami, N. N. Theory and application of electron channelling contrast imaging under controlled diffraction conditions. Acta Mater. 75, 20-50 (2014).
- Schulze, G. Metallphysik. , Akademie Verlag. Berlin. (1967).
- Jiang, J., Britton, T. B., Wilkinson, A. J. Evolution of intragranular stresses and dislocation densities during cyclic deformation of polycrystalline copper. Acta Mater. 94, 193-204 (2015).
- Inoue, M., Sugimoto, H., Tajima, M., Oshita, Y., Ogura, A. Microscopic and spectroscopic mapping of dislocation-related photoluminescence in multicrystalline silicon wafers. J. Mater. Sci.: Mater. Electron. 19, 132-134 (2008).
- Kato, G., Tajima, M., Toyota, H., Ogura, A. Polarized photoluminescence imaging analysis around small-angle grain boundaries in multicrystalline silicon wafers for solar cells. Jpn. J. Appl. Phys. 53, 080303(2014).
- Tajima, M. Spectroscopy and Topography of Deep-Level Luminescence in Photovoltaic Silicon. IEEE J. Photov. 4 (6), 1452-1458 (2014).
- Yablon, A. D. Optical and mechanical effects of frozen-in stresses and strains in optical fibres. IEEE J. Sel. Top. Quant. 10 (2), 300-311 (2004).
- Herring, R., Norouzpour, M., Saitoh, K., Tanaka, N., Tanji, T. Determination of three-dimensional strain state in crystals using self-interfered split HOLZ lines. Ultramicroscopy. 156, 37-40 (2015).
Reprints and Permissions
Request permission to reuse the text or figures of this JoVE article
Request PermissionExplore More Articles
This article has been published
Video Coming Soon
Copyright © 2025 MyJoVE Corporation. All rights reserved