Method Article
走査型電子顕微鏡による半導体材料における拡張欠陥の総合的な特性評価
要約
The optical, electrical, and structural properties of dislocations and of grain boundaries in semiconductor materials can be determined by experiments performed in a scanning electron microscope. Electron microscopy has been used to investigate cathodoluminescence, electron beam induced current, and diffraction of backscattered electrons.
要約
Extended defects such as dislocations and grain boundaries have a strong influence on the performance of microelectronic devices and on other applications of semiconductor materials. However, it is still under debate how the defect structure determines the band structure, and therefore, the recombination behavior of electron-hole pairs responsible for the optical and electrical properties of the extended defects. The present paper is a survey of procedures for the spatially resolved investigation of structural and of physical properties of extended defects in semiconductor materials with a scanning electron microscope (SEM). Representative examples are given for crystalline silicon. The luminescence behavior of extended defects can be investigated by cathodoluminescence (CL) measurements. They are particularly valuable because spectrally and spatially resolved information can be obtained simultaneously. For silicon, with an indirect electronic band structure, CL measurements should be carried out at low temperatures down to 5 K due to the low fraction of radiative recombination processes in comparison to non-radiative transitions at room temperature. For the study of the electrical properties of extended defects, the electron beam induced current (EBIC) technique can be applied. The EBIC image reflects the local distribution of defects due to the increased charge-carrier recombination in their vicinity. The procedure for EBIC investigations is described for measurements at room temperature and at low temperatures. Internal strain fields arising from extended defects can be determined quantitatively by cross-correlation electron backscatter diffraction (ccEBSD). This method is challenging because of the necessary preparation of the sample surface and because of the quality of the diffraction patterns which are recorded during the mapping of the sample. The spatial resolution of the three experimental techniques is compared.
概要
これは、欠陥が半導体材料1-3の電子構造に影響を与える拡張何十年も知られています。電子機器やセンサや太陽電池材料などの他のアプリケーションのパフォーマンスに拡張欠陥の影響が広範囲に及ぶ実験的および理論的な調査中です。それにもかかわらず、拡張欠陥の存在下での半導体の電子状態の計算には一般的に受け入れられている理論はありません。これは、理想的な結晶格子から逸脱した場合の電子構造計算の複雑さにも拡張された欠陥の種類や設定に関する大規模な多様性だけでなく、それらの間でと0次元の固有で可能な組み合わせにとあります外因性の欠陥。
拡張欠陥の主なタイプは、転位(1次元欠陥)と結晶粒界(2次元欠陥)です。以下では、我々は共同しました走査型電子顕微鏡(SEM)で行うことができる実験条件における拡張欠陥のこれらのタイプの両方にncentrate。ここで紹介する実験方法は、したがって、拡張欠陥を含む半導体材料における電子状態の間接的な知識を拡張欠陥の構造光学的および電気的特性についての情報を提供します。欠陥に関連する電子状態の制御は、半導体の用途および半導体デバイスの動作のための中心的な課題です。
拡張欠陥の構造の調査のために、電子後方散乱回折(EBSD)法を適用することができます。通常、EBSD測定を各点で静止電子ビームをポイントマッピングすることによって行われます。 EBSDは、次いで、単結晶材料の場合には多結晶材料における結晶粒の試料の結晶格子の結晶方位についての情報を与えます。フォーR菊池バンドによって形成された実験的に決定された回折パターンを有し、その目的は、材料の結晶の空間群の決定、シミュレートパターンと比較することによって分析されます。方位データの評価のためのソフトウェアは、隣接するマッピング点の結晶座標系との間の方位差角を計算することができる場合は、それらの間の粒界のタイプを決定することができます。方位差角が15°よりも小さい場合、低角粒界(LAGB)が存在します。それ以外の場合は、高角度粒界(HAGB)です。 HAGBの種類は、Σ-1は一致格子の上に横たわって格子点の割合であり、そのΣ値によって特徴付けられます。対称性の高い双晶境界4だから、Σ= 3スタンド。試料表面の二つの面にEBSDマッピングは、マッピングの位置の正確な知識を有する粒界面Wの種類を測定することができる場合i番目のミラーはHKLもランドル5によって提案された方法によって評価することができる指標。
最近、電子回折パターンの評価のための新しい手順は、ウィルキンソンらによって得られた。6完全な局所ひずみテンソルのすべての構成要素、 すなわち、の計算を可能にする3つの垂直ひずみ三剪断歪の絶対値コンポーネント。この計算は、同じ結晶方位を有する歪みのない結晶領域に沿った基準パターンに対して、対応する回折パターンのマッピングの各測定点について行われます。この評価手順は、名前ccEBSDを与える相互相関技術を用いてEBSDパターンの特徴の小さなシフトの決意に基づいています。選択された基準点に対する、歪成分と格子回転が10 -4と0.006&#の精度で測定することができます176 ;,それぞれ7。結晶粒界を横切るラインスキャン中、または転位の取り決めに沿ってccEBSD測定を適用すると、1は、ローカル金額並びにこれらの拡張欠陥の歪場の範囲を決定することができます。
転位や結晶粒界の光学特性は、分光及びイメージングカソードルミネッセンス(CL)法により調べることができます。発光シグナルは、SEMの一次電子ビームによって半導体材料内に生成される電子 - 正孔対の放射再結合によって引き起こされます。発光の強度は、放射再結合時間に合計少数キャリアライフタイムの比率である発光再結合効率に比例します。この比は、欠陥によって局所的に影響を受けた場合、発光分布のコントラストがCL像で観察することができます。通常、拡張された欠陥は、したがって、Lは、非発光再結合中心として作用しバンドバンドの再結合からuminescenceは邪魔されず、半導体に比べて拡張欠陥の近傍に低下します。しかし、転位にならびに粒界上にSi、Geおよびいくつかの化合物半導体材料の場合には、特徴的な発光バンドは、(直接または非直接)バンド間再結合のより低い光子エネルギーを示す観察されますバルク材料8〜10インチ例として、結合したシリコンウェーハのと関口や同僚11-13により多結晶シリコンの豊富なCL調査は、転位やLAGBsは、バンドギャップが浅いと深いレベルの発生に関与していることを明らかにしました。対応する放射遷移はCLスペクトルのD線として示されています。それにもかかわらず、酸素析出と遷移金属不純物によって転位の転位汚染の配置に伴う歪み場の役割はinterpretatため依然として議論がありますD線発光のイオン。異なる拡張欠陥の発光線のエネルギー位置の割り当てが正常に行うことができる場合には、その後、発光スペクトルにおけるこの特定の行の発生は、この欠陥の存在のための信号とすることができます。発光強度を増加させるために、すなわち 、非放射いずれかに関連して放射再結合は、CLの調査は、間接バンド構造を有する半導体材料の低温(冷凍CL)で実行されなければなりません。
ここで考慮拡張欠陥の電気的特性は、SEMの電流(EBIC)が誘導され、電子ビームを撮像することによって特徴付けられます。一次電子ビームによって発生した電子 - 正孔対が内蔵電界によって分離されている場合、この電流を観察することができます。このフィールドは、拡張欠陥自体の電位によって、または試料表面にショットキー電極によって生成することができます。 EBIC像電気的に活性な欠陥で様々な再結合の挙動に起因する電荷収集効率の局所的な変動の結果を対比。彼らは欠陥のない領域よりEBIC像で暗く表示されるように拡張欠陥は、通常は増加し、キャリアの再結合を示しています。欠陥14の物理ベースモデルの枠組みの中で、コントラストプロファイルと呼ばれるEBIC信号の空間依存性の定量的評価は、少数キャリア拡散長と寿命の決意だけでなく、表面再結合速度を可能にします。これらのパラメータは、温度に依存するので、EBIC調査はまた雑音比に強調信号を得るために、低い温度(低温EBIC)で実施されるべきです。また、温度依存EBIC測定はキトラーと同僚15,16によって提案されたモデルに従って、転位で深いレベルの不純物の濃度の決意を有効にします。
半導体における拡張欠陥の光学的および電気的特性は、汚染により、電子顕微鏡を走査することによって解決することはできない0次元の固有の欠陥17によって著しく影響され得ることに留意すべきです。しかし、実験方法、ccEBSD、CLとEBICの組み合わせは、拡張欠陥を視覚化するとSEMでの基本的な性質を定量化する機会を提供しています。将来のアプリケーションだけでなく、障害の解析だけでなく、制御および欠陥エンジニアリングが意図される欠陥を、この強力なツールは、半導体デバイスの性能の向上に重要な役割を果たします。
プロトコル
クライオCL実験1.試料の調製
- 平坦な表面と、0.2と0.5ミリメートルの間の範囲の5×5ミリメートル、厚さの最大面積:半導体材料(シリコンここ)からバルクサンプルを使用してください。
- エタノールまたはアセトンなどの有機溶媒と試料と試料ホルダーを清掃してください。 1分間1:10比のフッ化水素酸(40%)及び脱イオン水の溶液に浸漬することによって、試料上のシリコン酸化物表面層を除去します。脱イオン水でサンプルをフラッシュします。
- ミル機械的試料に相当する表面積及び約0.5mmの厚さのインジウム箔を形成するためにインジウムワイヤ片。
- 上に試料ホルダーとサンプルのインジウム箔を入れ、金属製のソケットに60°-pre-傾斜試料ホルダーをマウントします。
- 加熱プレート上にソケットを配置します。
- thermometeで、加熱プレート上でソケットの制御温度を切り替えインジウム箔の溶融工程が差し迫っているように、150℃までのソケットをrと加熱。
注:インジウム157℃の融点に到達するが、箔は延性であることが必要ではありません。 - 1秒間木製の爪楊枝でサンプルを押して、インジウム箔上にサンプルを修正しました。
- 加熱プレートのスイッチをオフにし、約30分間、システム全体をクールダウン。
クライオEBIC実験2.試料の調製
- 平坦な表面と、0.2と0.5ミリメートルの範囲で5×5ミリメートル、厚さの最大面積:半導体材料(シリコンここ)からバルクサンプルを使用してください。
- エタノールまたはアセトンなどの有機溶媒と試料と試料ホルダーを清掃してください。 1分間1:10比のフッ化水素酸(40%)及び脱イオン水の溶液に浸漬することによって、試料上のシリコン酸化物表面層を除去します。脱イオン水でサンプルをフラッシュします。
- SAをマウントmple金属化システムへと金属を蒸発させる( 例えば 、p型Si、N型Si上のAu上のAl)試料の上面にショットキーコンタクトを形成します。
- シリコン試料の裏面に流体ガリウム - インジウム共晶の液滴を堆積し、オーミック接触を生成するためにそれを塗り付けます。
ccEBSD実験3.サンプルの調製
- 紙に薬剤を研削・研磨の粒径( 例えば 、第一のダイヤモンドペーストを3μmの減少に伴ってステップを研削・研磨のシーケンスを適用することにより、平坦な試料表面を準備し、振動研磨に次にダイヤモンドペースト1ミクロン、最後の研磨)研磨懸濁液で。各ステップの間に、脱イオン水でサンプルをフラッシュします。
- 3分間超音波浴中のエタノールでサンプルを洗浄することにより、表面の準備を終了します。
- 両面粘着cに機械的固定によって、または接着により金属試料ホルダーにサンプルを固定しアルボンタブ。
4.実行クライオCL実験
- 液体窒素(LN)と8時間の実験期間中、液体ヘリウム(液体ヘリウム)などの寒剤の可用性を確保します。
- SEMでクライオステージを使用してください。
- SEMに位置を測定する駐車位置からの集光楕円鏡を挿入します。
- ステージ上で直接バンドギャップ移行に:(バルクGaAsのサンプルここでは)試験サンプルをマウントします。
- コラム室弁が開くまで、SEM室を退避します。 20 kVの、240ミクロンの開口サイズ、高電流モードのON、電子ビームの走査速度1に、200の倍率と画素平均値にノイズリダクションにSEM撮像パラメータの加速、高電圧(HV)を設定します。
- 二次電子とのイメージングのためにエバハートソーンリー検出器を使用してください。電子ビームは、15mmの作動距離(WD)で試料表面に焦点を合わせることができるまで、ポールピースに向かってステージを移動させます。
- モノクロメータのための電源を切り替えることにより、CL検出システムの起動手順を実行し、光電子増倍管用高圧電源(PMT)、PMTの冷却システムとCL制御プログラムを有するラップトップ。 CL制御プログラムを起動し、対時間PMT信号の測定を選択します。
- PMTのコントラスト(最大)と明るさ(46%)に適切な値を設定します。
- 実験を記録するログファイルを作成します。
- 傾けるとミラーを回転させることにより、試験試料上で不可欠なCL強度を最大化するために、集光ミラーを調整します。 CL制御プログラムを使用して、CLテストスペクトルを記録します。
- SEMチャンバベント、試験試料を除去し、試料ホルダー上にインジウム箔上に実際のサンプルをマウントし、SEMチャンバを排気。
- 柔軟な真空管によってダイヤフラムポンプの入口とSEMの極低温ガスのための出口をリンクします。シール要素としてのOリングとセンタリングリングを使用して修正クランプリングとそれ。ホース継手における減衰重みの統合により機械的にシステムを安定させます。
- それが利用可能な場合、彼の再循環システムに柔軟な真空管によってダイヤフラムポンプの出口に接続します。シール要素としてのOリングとセンタリングリングを使用し、クランプリングで固定します。
- SEMステージ上の適切なプラグコネクタと温度制御ユニットの温度センサを接続します。温度制御ユニットの電源をオンにします。
- SEMの極低温ガスの排出口の横に柔軟な真空管に加熱テープを組み立てます。
- 保護メガネや保護手袋を着用してください。液体ヘリウムデュワーに液体彼のためにチューブを挿入します。 SEMのクライオステージの極低温ガス用の入口と彼の移送管の出口を接続します。
- 240ミクロン、高電流モードのON、電子のスキャン速度を20 kVで、開口部の大きさに電子ビームパラメータHVを設定します。1のビーム、200の倍率と画素平均値にノイズリダクション。
- 二次電子とのイメージングのためにエバハートソーンリー検出器を使用してください。ポールピースに向かってステージを移動し、CL実験用のWD = 15ミリメートルで試料表面に電子ビームの焦点を合わせます。
- 試料表面の関心領域を選択し、全体の冷却ダウン手順の間に、地域全体でスキャンします。全体CLの実験中に、関心領域における試料の表面がステージの適切なポジショニングによって、WD = 15ミリメートルであることを確認してください。
- 最低目標温度を入力することにより、冷却ダウン手順を開始します( 例えば 、5 K)技術マニュアルに従って温度コントローラへのPID制御のための、適切なパラメータを設定します。液体ヘリウムの移送管のバルブを開きます。
- 試料温度、ダイヤフラムポンプからのHe圧力、および冷却ダウン手順中のPMTからの積分CL信号出力を監視します。 RCL強度がPMTの損傷を防ぐために、低温で高くなりすぎた場合、モノクロメータのスリット幅を引き出します。
- 目標温度に到達するために必要に応じて液体ヘリウムトランスファーチューブのオリフィスを増やします。
- 目標温度に達した後にフォーカス・イメージのためのWD = 15ミリメートルを再確立します。実際のサンプルの最大一体型のCL強度のための集光ミラーの調整を修正。
- 回折格子のための適切な値(ミリメートル、千nmでブレーズあたり300行)、スペクトル領域(1050〜1600 nm)を、ステップ幅(5 nm)を、点(5秒)を測定するごとに時間を設定し、(1ミリメートル)のスリット幅のためシリコン試料上のスペクトルのCL測定。 CL制御プログラムを使用して、サンプルの録音CLスペクトルとノートパソコンのハードディスクに保存します。
- パンクロマティックCLイメージング、それぞれ単色のCLイメージングのための特定の波長でブレーズ格子のためのモノクロメータで平面ミラーを選択してください。明るさとコントラストを調整しますPMT信号からグレー値の依存性の線形範囲のCL像の値。
- 適切な画像解像度( 例えば 、1024×768ピクセル)、CLイメージングのためのスキャン速度とノイズ低減方法( 例えば 、200〜1,000ピクセルの平均と組み合わせるスキャンの最低速度14、またはそれ以上のスキャンの間の範囲の拡大のための調整速8は、ライン平均20行以上)と組み合わせます。 SEM制御プログラムを持つレコードのCL画像やコンピュータのハードディスクに保存します。
- 名前とログファイルに全測定セッション中に測定された各スペクトルと画像のパラメータを入力します。
- 電子ビームのHVスイッチを切り、温度依存性のCLの調査のための温度コントローラに、より高い目標温度を入力することにより、試料温度を変更する前に、SEMカラム室バルブを閉じてください。
注:これはSEM室真空DURの不安定性により、電子銃のシャットダウンを回避することでする加熱アップ。 - SEMカラム室バルブを開き、新しい目標温度に到達するとSEMチャンバー内のシステムの真空が再び安定しているときにHVをオンにします。
- 電子ビームのHVスイッチを切り、SEMカラム室弁を閉じ、PMT用のシャッターを閉じ、PMTの電源とクーラーのスイッチを切り、低温で計画されたCL測定を終えた後のウォームアップ手順を実行します。
- SEM室を開くことなくクライオCLの実験のために組み立てられている追加のデバイスやツールを削除します。
- SEM室は、少なくとも12時間、閉じたままにしておきます。サンプルホルダの温度は室温であることを確認してください。そうでなければ、SEMチャンバを開く前に室温にサンプルホルダを加熱します。
注:これは、SEMチャンバ内に湿気を防止することです。 - ステージから試料を取り出して、SEM室を避難。
5.実行クライオEBIC実験
- エン8時間のテスト期間のための液体ヘリウムの可用性を確認してください。
- SEMでクライオステージを使用してください。
- 雲母の板が上面に蒸発Au層で利用可能であることを確認してください。
- 上向きにし、最初の試料ホルダーに上向きのショットキーコンタクトとマイカ上の実際のサンプルをAu層とマイカの作品をスタック。 1コンタクトチップは、実際のサンプルや雲母の蒸発Au層上の他の1のショットキー接触に置きます。
- コラム室弁が開くまで、SEM室を退避します。 SEM撮像パラメータHV、開口サイズ、スキャン速度、倍率やノイズリダクションの適切な値を設定します。
- サンプル電流アンプのスイッチをオンにし、試料電流の小数点以下3桁が表示されるように、測定範囲を選択します。
- 実験を記録するログファイルを作成します。
- クライオCL実験から4.16に、手順4.12を実行します。
- Sの適切な値を設定しますEMは30〜1,000、アパーチャサイズ20〜60μmで、EBICイメージングのためHV、開口サイズ、倍率、走査速度、およびノイズ低減方法のパラメータ(結晶粒界のEBICイメージングのためのパラメータの推奨範囲は、HV 10〜20キロボルトであります倍率のため、9)スキャン速度、およびピクセルまたはフレーム平均のための14に。
- EBICイメージングのためのサンプル電流検出器を使用してください。ポールピースに向かってステージを移動し、15と25ミリメートルの間の範囲内でWDのための電子ビームの焦点を合わせます。
- 試料表面の関心領域を選択し、全体の冷却ダウン手順の間に関心の領域全体にスキャンします。
- 最低目標温度を入力することにより、冷却ダウン手順を開始します( 例えば 、200 K)技術マニュアルに従って温度コントローラへのPID制御のための、適切なパラメータを設定します。液体ヘリウムの移送管のバルブを開きます。
- クールな中にダイヤフラムポンプから試料温度とHe圧力を監視しまするダウン。
- SEMの画面を分割し、温度による画像の変化を見るために、試料電流検出器からのEBIC信号に並列にEverartソーンリー検出器からの二次電子の信号を監視します。
- 再調整SEMは、高コントラストのEBIC像を取得するためにHV、開口サイズ、倍率、走査速度、およびノイズリダクションパラメータ。低温で表示オーバーフローを避けるためにも、試料電流アンプの測定範囲を再調整します。
- 目標温度に達した後、電子ビームを再焦点を当てます。
- EBIC像を記録します。ログファイルに名前と各画像のパラメータを入力します。
- 電子ビームのHVスイッチを切り、温度依存EBIC調査のための温度コントローラに目標温度の高い値を入力することにより、試料温度を変更する前に、SEMカラム室バルブを閉じてください。 SEMカラム室バルブを開き、HVに切り替えると、新しいターゲットテmperatureに達すると、システムの真空が再び安定しています。
- SEMカラム室弁を閉じ、低温で計画されたEBIC測定を終えた後のウォームアップ手順を実行し、電子ビームのHVをオフにします。
- SEM室を開くことなくクライオEBIC実験のために組み立てられている追加のデバイスやツールを削除します。
- SEM室は、少なくとも12時間、閉じたままにしておきます。サンプルホルダの温度は室温である保証するために確認してください。そうでなければ、SEMチャンバを開く前に室温にサンプルホルダを加熱します。
- ステージから試料を取り出して、SEM室を避難。
6.実行ccEBSD実験
- 小さなバイス内または電子ビームの方向に対して65°と70°の範囲で事前に傾いているサンプルホルダーのピンにサンプルをマウントします。
- また、SEMに6軸ユーセントリックステージ上にサンプルを配置し、チルト試料面法線と電子ビーム方向は、65°と70°の範囲の角度になるように全体のステージ。ステージは、検出器とチャンバ壁と衝突しないことを確認してください。
- コラム室弁が開くまで、SEM室を退避します。適切なSEM撮像パラメータHV(20キロボルト)、開口部(120ミクロン)、高電流モードのON、スキャン速度の値( 例えば 、5)、倍率( 例えば 、3000)とノイズリダクション(画素平均値)を設定します。
- 12及び22ミリメートル(mm)の範囲内WDで試料表面に電子ビームを集束。
- 電子ビーム加速電圧をオフにし、カラム室バルブを閉じてください。
- EBSD検出器の電源をオンにします。 SEMチャンバ内の位置を測定する駐車位置からのEBSD検出器を移動します。
- コラム室バルブを開き、電子ビーム加速電圧に切り替えます。の領域上に電子ビームを再焦点試料表面の関心。
- EBSD制御ソフトウェアを開き、選択されたWDのキャリブレーションファイルをロードします。
- 操作マニュアルに従ってEBSD制御ソフトウェアで測定を設定します。
- EBSD取扱説明書に従って背景取得を実行します。
- EBSDパターンの中心の位置とEBSD制御ソフトウェアから選ばれたWDのための検出器距離を読み出します。
- 実際の測定のための目的の領域に隣接するサンプルの領域に電子ビームを集束。安定化のため、約1時間のためにそこにスキャンするビームを残します。
- 全体EBSD測定中に1μm以下を超えてはならないビームドリフトの量を確認してください。
- 関心と再焦点の領域に電子ビームをナビゲートします。
- スケジュールラインは、関心領域内の傾斜軸に対して平行に走査します。ビームマッピング(いない段階のマッピング)の設定を使用してください。秒数の適切な値を選択しますTEPS( 例えば 、100)、ステップサイズ( 例えば 、50ナノメートル)、露光時間( 例えば 、43ミリ秒)、フレーム平均値( 例えば 、10)と検出器ビニング( 例えば 、2×2)。
- 「すべての画像を保存」を選択してください。測定をスピードアップするためにインデックス付けを無効にします。
- 最後のスキャンが終了するまでのラインスキャンを実行します。
- 電子ビーム加速電圧をオフにし、カラム室バルブを閉じてください。
- 位置を駐車し、EBSDコントロールユニットの電源をオフにする測定位置からEBSD検出器を撤回。
- チャンバーをベント、サンプルを削除して避難してください。
CL-データの7.分析:
- 既知のスペクトル線のスペクトル位置を比較することにより、回折格子のキャリブレーションをチェックします( 例えば 、文献のデータとバルクおよび歪みのないGaAsのテストサンプルの発光線のピーク)、必要に応じて波長キャリブレーションを変更します。
- (int型記録CLスペクトルを修正各測定点で対応する感度値によって測定された強度を分割することにより、ブレーズ格子とPMTから構成され、光学系の波長依存感度に関して対波長ensity)。
- CL画像の各画素のグレー値を抽出し、少なくともサンプル中の電子の相互作用容積の規模で、画像内の関心領域ごとにグレー値を平均します。
- PMTの与えられたコントラストと明るさの値のCL強度に応じて、CLの画像の平均グレー値の検量線から関心領域のためのCL強度を決定します。
- 平均CL強度全体CL像のI CLとCL検出器の暗信号I 0を評価します。
- 次式でCL像に明暗現れる領域の間のコントラストC CLを計算します。
D / 53872 / 53872eq1.jpg "/>
EBIC-データの8.分析:
- EBIC画像の各画素のグレー値を抽出し、EBICコントラストの点でEBIC強度の空間的変化を定量化するために、関心の各領域のグレー値を平均します。
- C. DonolatoとROベル18による空間的に分解グレー値からEBICコントラストプロファイルを決定します。
- EBICコントラストプロファイルの面積と分散を計算します。
- Donolato 14によって与えられたルールに従って、このようなEBICコントラストプロファイルの拡散長と計算されたエリアからの少数キャリアの表面再結合速度および分散などの物理的パラメータを決定します。
ccEBSD実験の9分析
- 記録されたEBSDパターンの評価のためにポール・Chekhoninによってプログラム、社内で書かれたソフトウェア「ccEBSD "を使用してください。
- appropriatを選択します。菌株の存在しない試料領域に配置されるべきである測定点からの基準パターンとして機能する電子のEBSDパターン。
- パターン上の目的の少なくとも15広く分布している領域を適用します。
- さらなる評価のためのEBSD制御ソフトウェアによって決定されたパターン中心と検出器の距離の座標を使用してください。
- 評価、 すなわち 、分析材料の弾性定数、ラインスキャンとステップサイズのステップ数、検出器のサイズとピクセル単位でその解決のための関連するパラメータの残りの部分を入力し、検出器と試料傾斜角度と同様に検出器ビニング。
- 2次元フーリエ変換(6ピクセルの内部フィルターと40ピクセルの外側フィルタ)の計算中にバンドパスフィルタを使用してください。
- 評価プログラムを実行します。
- 評価テキストファイルから数値結果を読み出す」protocol.txt「従来のスプレッドシートプログラムワットを使用して、鶏は、計算が終了します。
結果
半導体材料における拡張欠陥の、構造的、電気的および光学的特性は、走査型電子顕微鏡で異なる実験法によって調べました。一般的に、同じサンプルに、さらに粒界や転位の局所的な配列のような明確な単一欠陥のサンプル調製を、に関するいくつかの努力でこれらの特性を調べることが可能です。しかし、物理的欠陥の特性の検査に使用される半導体材料と、一次電子ビームの特異的相互作用の生成物に、CL、EBICまたはccEBSD調査することによって達成することができる空間分解能が互いに異なることに留意すべきです。 図1において、概略図面はEBIC調査のための低温でのCL測定に適したSEM( 図1A)、アセンブリの適切なセット・アップするために与えられている( 図1B 強い)と同様に(CC)EBSD試験( 図1C)のために必要な主なハードウェア要素のレイアウト。
ここに与えられた全ての代表的な結果は、間接の電子バンド構造を有する半導体材料のためのショーケースとしてシリコンについて得られます。このバンド構造は、直接バンドギャップ構造を有する半導体に比べて放射遷移の低い確率のためにすべての発光測定を妨げます。統計的に確実な結果を得るために十分な発光強度を実現することは困難です。以下では、実験手順は、塑性変形によってだけでなく、シリコン単結晶中の液相の再結晶化により誘導される転位の調査のために記載されています。また、ツイン粒界シリコン双結晶と低角粒界の研究が提示されています。
図2Aは、温度は、熱電対によって測定された凍結試料ホルダへの良好な熱的接触を保証するために、インジウム箔上のサンプルの適切な位置決めの一例を示しています。これは、シリコンのために、約200〜500μmの試料の厚さは、バージン状態でSi単結晶を測定した。図2(b)に与えられた5 KでのCLスペクトルまでの温度で凍結CL調査によく適していることが実験的に証明されました、塑性変形後および追加のアニール後。 SEM内の電子ビームを20 kVでの電子ビームの加速電圧と大容量に起因した電子 - 正孔対の生成に高いCL強度を生じるデフォーカス走査モード、(約45のNaプローブ電流で運転しました適度な励起密度と(450×250×3)μmの3)について。この走査モードでは、試料表面はWD = 15 mmの上に実際にあるが、電子的にWD = 0が調整されます。 Cの場合L画像は、当然のことながら、電子ビームは、数nmの試料表面上でなく、デフォーカス走査モードで一次電子の一部ミクロンの同じ侵入深さの電子ビームのスポット径を得ている集束されなければなりません。 1,024×768ピクセルの店舗解像度の画像あたりの収集時間は、電子ビームの走査速度14の画素平均化モードでは約10分でした。これは、計算され、実験的にデフォーカス走査モードで調査中のサンプル領域の温度が原因で、電子ビームへの熱エネルギーの移動により一部の0.1 K以下で増加されていないことが確認されました。フォーカスされたモードでは、地元のサンプル加熱が強く順番にサンプルドーピングと温度自体20に依存し熱伝導率に依存します。フロートゾーン成長したSiサンプル、pドープされたホウ素で10〜15 cm -3で、集束走査モードでの濃度での局所的な温度上昇ΔTのため約2 Kは、5 Kのクライオスタットの温度で発生し、25 K.でΔT≈0.3 Kの
転位の光学的特性を研究するために、バルクSi試料を420℃で295 MPaのに第二変形工程に続いて、800℃で16メガパスカルの圧力で塑性変形を行いました。変形した試料の一部の表面に、図2(c)に示すスリップラインは、二つの異なる111指向すべり面上の転位の滑りプロセスによって引き起こされます。スリップラインは、後方散乱電子(BSE)によって可視化することができます。スリップラインは、転位のほとんどが整列されている格子面の痕跡を示しています。単色CL(モノCL)像( 図2Dおよび2E)は D4とD3発光バンドのエネルギッシュな位置で取得したとスリップラインによる表面トポグラフィープロファイルから大幅に低下していません。これは、CLの調査aで確認しましたFTER CL強度ストライプパターンはすべり面のトレースに平行な本来波状の試料表面上と同じほぼ不変の発光ストライプのパターンを示した慎重な表面研磨。画像から定量的にCL発光強度の局所分布を分析するために計画されている場合には、CLの画像は、CL信号と濃淡値との関係を線形範囲内に記録しなければなりません。この関係は、画像のグレー値と所定のコントラストと検出器の輝度値での光電子増倍管の絶対的な信号の間の相関を測定することによって実験的に決定することができます。試料表面上のCL強度の小さな変化を可視化することを意図している場合は、逆に、最良の結果を得るために、非線形信号対グレイ値の関係は、SEMの撮像処理中に既に適用されるべきです。低温でのバルクシリコン試料のCL像の空間分解能は、相互作用の大きさによって決定されます試料中の一次電子の量は、この相互作用体積の大きさは、電子-正孔対21の放射再結合のための体積よりもわずかに小さいからです。集中的かつ固定ビームのための相互作用容積の直径は、与えられた実験条件の22の下で約3μmです。
ccEBSDによって拡張された欠陥の周囲の歪み場の推定はあっても非常に緊張したサンプル領域に十分な品質を持つ菊池パターンの記録を必要とします。一例が図3Aに示されています。これらのパターンを得るために、試料表面は、望ましくない表面層があってはならない(酸化物、炭素汚染、 など )。良好な結果は以下の実験パラメータを用いて達成することができます:電子ビーム20のkeVと12 nAに、WD = 15ミリメートルで、入射ビームに対して60°、70°、2×2のEBSD DETE間の通常の試料表面の傾きで測定点と菊地のストレージあたり5〜10フレームを平均672×512ピクセルの解像度をもたらすCTORピクセルビニング、EBSD検出器にフレームあたり20〜43ミリ秒の間に高、露光時間に設定された信号の増幅利得、索引付けせずに、各測定点のための画像としてパターン。 1菊池パターンの総取得時間を読み出して格納フレームの数とビームシフトのために必要な時間のために、数10ミリ秒を乗じた露光時間から推定することができます。 50nmの値は、EBSDマッピング内の2つのサンプルの位置の間の良好な最小ステップサイズであることが実験的に判明しました。これは、電子線回折コントラストのために達成可能な解像度に関する最近の理論的考察23と一致しています。 EBSDマッピング中にビームドリフトを回避するために、マップを実行する前に、関心領域のすぐ近くでビーム走査で少なくとも15分を待つことをお勧めします。それだけEBSD線が傾斜軸が同一線上に基準パターンを現実的な歪みデータを提供する試料と平行に走査することが見出されました。そうでなければ、実際のサンプルの傾斜角を非常に慎重に決意が必要とされるか、あるいはラインの長さは数μmに制限されなければならない傾斜軸に対して垂直に走査します。
8ビットのJPEGファイルとして格納されている菊池パターンはフーリエ変換(FT)と著者(PC)のいずれかで書かれたプログラム「ccEBSD "との相互相関により評価しました。プログラムは、文献に詳細に記載ウィルキンソンet.al. 6、によって開発されたアルゴリズムに基づいています。菊池パターンでは19、いくつかの(15から19)サブパターン(128×128ピクセル)は、明るいバンド交差(参照の図3Aおよび図3B)などの特徴で定義する必要があります。すべてのサブパターンは、FTによって分析されなければなりません。バンドパスフィルタは、FTの画像のすべてに適用されなければならない(内径6πフーリエ空間におけるバンドパスフィルタ(参照: 図3C)の外にゼロにすべての値を設定するために、低周波数についてxels、外半径より高い周波数では40ピクセル)。そして、相互相関(CC)機能( 図3D)は、基準菊池パターンから各サブパターンのFT( 図3Eおよび3F)で各サブパターンのFTとの間で計算しなければなりません。 CC-機能( 図3D)のピークの位置から、サブパターンの相対的な変位を決定することができます。これらの変位を用いて、正常およびせん断ひずみ成分を算出することができます。物質依存の弾性定数が既知である場合、また応力成分を決定することができます。フォークトによって表記では、これらの定数は、C 11 = 165.7 GPaで、C 12 = 63.9 GPaで立方格子24を有するSiのためのC 44 = 79.9 GPaです。 1菊池PAのすべてのサブパターンからの結果の組み合わせtternはひずみ評価の精度を向上させることができます。シリコン単結晶の欠陥フリー領域にccEBSDラインスキャンから決定統計誤差は、全てのひずみテンソルコンポーネントの2×10 -4であることが見出されています。それにもかかわらず、拡張欠陥の場合の定量的な結果を得るために、参照パターンとしての菊池パターンの選択が重要です。 図2に示すように、例えば、試料が完全に転位によって覆われている、場合に、ジャンら 25により提案された洗練された手順は、適切な参照パターンを見つけるために適用することができます。
ccEBSDの利用状況は、液相の再結晶化を誘導するために高エネルギー電子ビームによって処理されたSiウエハ([001] -表面配向)のために容易である( 図4参照)。再結晶化のトラックの周りに、スリップラインがDISLを示すBSE画像に表示されますトレースとの滑り面上ocationの動きが画像( 図4A)のエッジに平行です。 CL調査は塑性変形し、サンプルと同じ実験条件下で行いました。バンド間遷移とD4とD2転位発光バンド(それぞれ図4B、4Cおよび4D)のエネルギーで記録されたモノCL像は、再によって生じる拡張欠陥の空間分布を示して-crystallization手順。バンド間遷移とD線発光帯域間の局所抗相関は、モノCL画像から推測することができます。これは、電子ビームのスポットモードでのサンプル位置1,2及び3(参照する図4A)で測定したCLスペクトル( 図4E)により支持されています。再結晶トラック( 図4Aの白線)の前にラインスキャンとして実行ccEBSD調査から、局所的なひずみテンソルcomponenラインスキャンに沿っtsが( 図4Fおよび4G)決定することができます。これは、統計的な誤差の範囲内で、値がこのパターンはバンド間遷移が支配的な領域に位置する場合、特定の菊池パターンを基準パターンとして使用したに依存しないことが、証明されました。脱臼に関連する電子遷移は、通常の株Trを(ε)の合計が5×10 -4の値を超えた場合に表示されます。 Trは(ε)再結晶トラックに近い約150μmの長さの領域でのスキャンのためにゼロに等しくないので、試料表面に近い量の平均格子拡張があります。評価プログラム「ccEBSD」の前提として、弾性の線形理論によると、33σ垂直応力はゼロに等しいです。 EBSDラインスキャンにクラックがある場合、ccEBSD評価起因菊池パターンCAUの急激な変化に一つの基準パターンの全体スキャンを介して行うことができません亀裂の幾何学的効果によってsedの。
何Si中の結晶粒界の構造光学的および電気的特性の調査のために記載した実験方法により、原理的には達成することができるが10 17 cmでホウ素濃度を有するp型ドープのSiのバイクリスタルは、 図5に示されています-3。従来のEBSDマップは菊池パターンのインデックスを作成する場合にのみが取得ソフトウェアによるパターン取得後すぐに実行され、マップの各点での結晶方位の完全な情報が得られます。さらに、また、粒界のタイプは、従来のEBSDデータ管理プログラム( 図5A)により表示することができます。 LAGBの検出のために、臨界角は、隣接する2つの測定点での結晶格子の方位差のために定義されなければなりません。 1°の最小値が適切であることが証明されました。のためにLAGBは方位差角が4.5°であり、EBSDマップに示されています。同じサンプル領域( 図5B)のEBIC画像を室温で測定しました。インコヒーレントΣ3粒界とLAGBは暗い線としてここに表示されます。この効果は、局所的に増加したキャリアの再結合によって引き起こされます。 LAGB(参照、 図5H)、(60±12)μmでの拡散長と(4.1±0.4)の再結合速度を横切っEBIC信号のコントラストプロファイルから10 4センチ秒-1のために決定されたxをDonolato 14によるモデルの枠組みの中で少数キャリア。 EBIC像における単一の暗い点、全体の試料表面に広がり、特にLAGBの付近に集中は、貫通転位の位置を示しています。 4 KでのCLイメージング研究では、LAGBは、バンド間遷移エネルギー( 図5C)、予想されるように、しかしsurprisiでモノCL像で暗く見えますnglyまた、通常、転位に割り当てられているD4バンド( 図4D)のエネルギーでモノCL像インチしかし、LAGBはD1 / D2の発光バンド( 図5E)に対応する1530ナノメートルの波長でモノCL像に明るいように見えます。この発光現象はLAGBを構成する転位の近傍に点欠陥によって誘発されると考えられています。回線がローカル歪場を決定するLAGB横切って走査するようさらに、ccEBSD手順が実施されました。電子ビームの加速電圧は、それぞれの菊池パターンに対する増加合計取得時間を犠牲にして歪み決意の空間分解能を増加させるために10キロボルトまで減少しました。ダブルパターンは菊池パターンの解析を妨げるように見えるため、 図5F及び5Gに示す通常およびせん断ひずみ成分は、それぞれ、(約50nm以上)LAGBの中心領域に対して計算することができません。もっと以上、LAGBの両側のEBSDパターンは相互相関法のみ回折パターンの小さな変動を適用することができるので、二つの異なる参照パターンと相関されなければなりません。そのように、二つの基準パターンは、2つのサブ粒子間の大きな誤配向角度に左側とLAGBの右側に集めました。それにもかかわらず、歪成分がLAGBの両側に対称的に動作すること刺激的です。ひずみ成分の位置依存性のための図はLAGBの歪み場の範囲が両方のサブ粒子に約350nmまで延びていることを示しています。逆に、バンド間遷移モノCL像であり、EBIC画像( 図5H)におけるEBIC信号のコントラストを局所的に変化するコントラストの図は、発光シグナルのLAGBの影響を示していますそして、EBIC信号に10μmの最大±範囲であり、中心から1.5μmで± LAGBの、それぞれ。これは、拡張欠陥の異なる特性の調査のためのローカル解像度が強く適用実験方法やパラメータに依存する最初から文を検証します。

図1. CL、EBICとccEBSD測定のための設定。電界放出銃を持つ(A)SEM、イメージングおよび分析のための異なるアパーチャ、クライオ試料ホルダー上のサンプル、CLの集光ミラー、分光器と赤外光用のIR-PMT、(B)ショットキーEBIC調査および(C)結晶方位の情報を取得するために数値的に分析することができ菊池パターンの形成および貯蔵のためのセットアップのための試料の接触だけでなく、 ccEBSDによる結晶格子の歪みに。D / 53872 / 53872fig1large.jpg "ターゲット=" _空白 ">この図の拡大版をご覧になるにはこちらをクリックしてください。
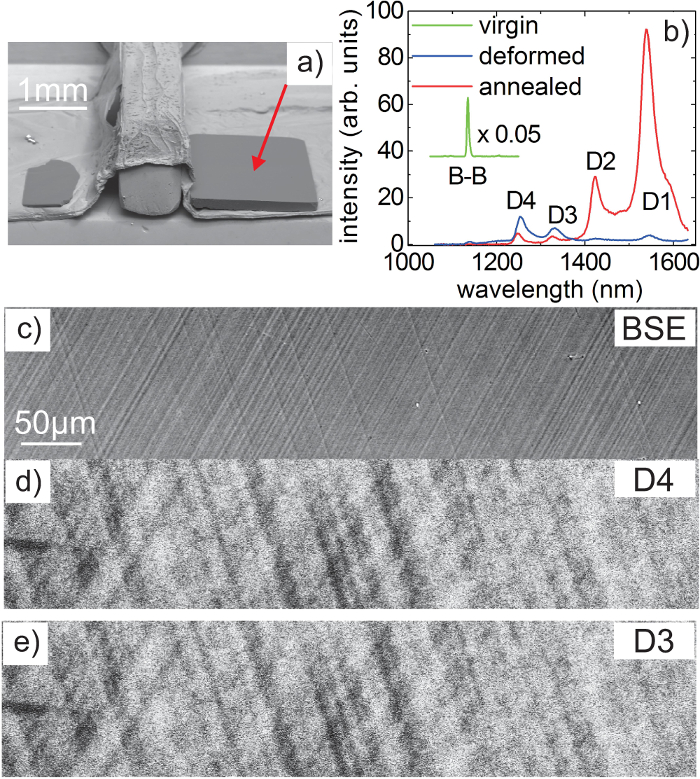
塑性変形シリコン単結晶上の図2. CLスペクトルおよびイメージング調査。(A)クライオ試料ホルダー上に位置するインジウム箔上にシリコンサンプル。 (B)CL-スペクトルは、高純度の単結晶Si(バージン)のために、塑性変形したサンプルのために、追加のアニール後に測定しました。スペクトルの特徴的な遷移は転位誘起発光バンドのために、バンドの移行のためのBBでいつものように標識し、D1〜D4はされています。変形Si結晶の表面に(C)スリップラインは、後方散乱電子(BSE)により撮像された( 図2Aの赤い矢印でマーク)。これらの結果は、異なるスリップsysteのための塑性変形を示し、ミズ。 図2Dおよび2Eでは、D4ラインとD3ラインのモノ-CLの画像はBSE-画像( 図2C)に示したもの以下同じサンプル領域について測定し、それぞれに、それぞれ示されている。 表示するには、こちらをクリックしてください。この図の拡大版。

ccEBSD分析のコースのステップを可視化図3.イメージ。(A)サブパターンと実際のサンプル位置からフル菊池パターン。 (B)サブパターンの一方及び(C)は、濾過フーリエ変換。 (E)サンプル上の基準位置と、(F)は、濾過フーリエ変換から、対応するサブパターン。 (D)相互相関関数(CCF)サブパターンのフーリエ変換から計算しました。 CCFの明るさは、詳細を可視化するために20%増加した。 この図の拡大版をご覧になるにはこちらをクリックしてください。
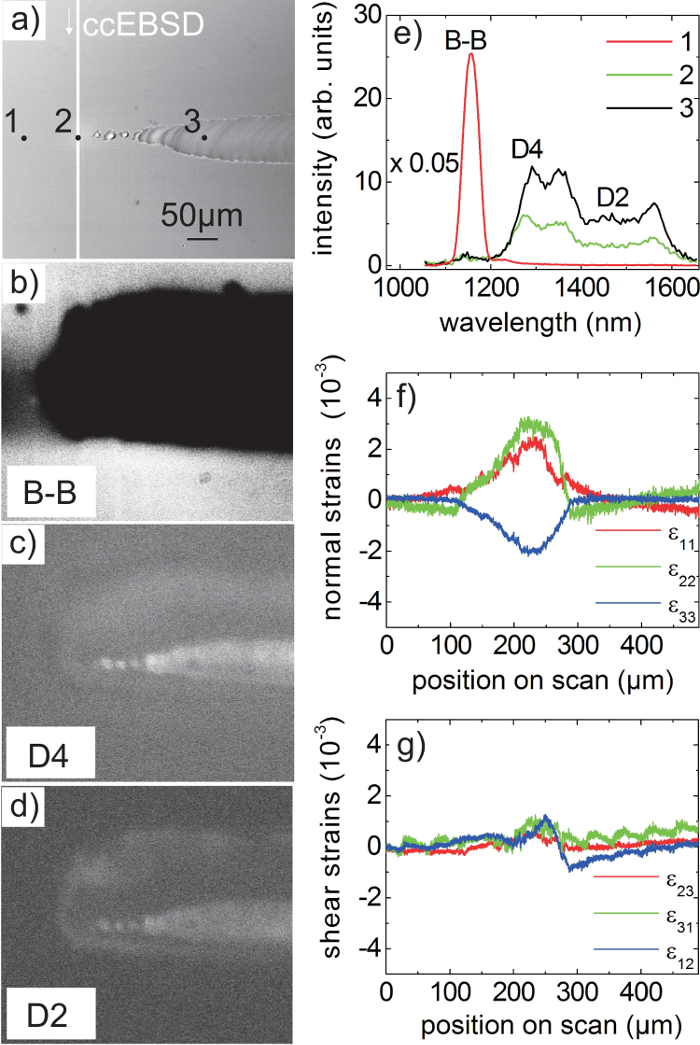
再結晶化した後、図4、SiウェハのためのCLとccEBSD調査。高エネルギー電子ビームによる治療後の再結晶化材料のトラックとSiウエハの表面から(A)BSE画像。 CLスペクトルの調査のためのスポット1、2と3の位置がccEBSDスキャンが実行された方向矢印と線と同様にマークされています。バンド間遷移(B)の精力的な位置で撮影した(A)に示す試料領域(BD)モノCL像、D4(C)及びD2(D)発光バンド。 (E)CLスペクトルスポット1、2で測定し、3ノーマル(F)とccEBSD調査から算出した(A)のラインスキャンに沿ってせん断ひずみ成分(G)、。 拡大版をご覧になるにはこちらをクリックしてください。この図の。

図5. EBSD、黄色と黒でLAGBツイン結晶粒界を有するSi双結晶にHAGBsとLAGB。(A)のEBSD方位マップを有するシリコンバイ結晶にEBIC、CLとccEBSD調査 。粒子表面の法線の方向が示されています。 (B)のサンプル領域のRT(A)コヒーレント(黄色の矢印)とincohereでEBIC像NT(青い矢印)ツイン結晶粒界が示されています。 (CE)BBのエネルギーでモノCL画像(C)、D4(D)及びD1 / D2(E)は、EBIC像(B)の赤い四角でマークされてLAGB領域に属します。 LAGB全体のccEBSD調査から算出した通常の(F)とせん断ひずみ成分(G)。 (H)4KでとLAGB全体のRTでEBIC像でBBモノCL像に見られるコントラストの比較。 x座標歪み成分図にとCL-とEBICコントラスト図に上の異なるスケーリングに注意してください。 この図の拡大版をご覧になるにはこちらをクリックしてください。
ディスカッション
SEMは、半導体材料に拡張された欠陥の位置を特定するだけでなく、ccEBSD、CLとEBIC調査の適用により、その構造の光学的および電気的特性を特徴づけるために可能性を提供しています。一般的には、同じサンプル上で同時にすべての3つの方法を実行することは不可能です。合理的な順序で実行するときしかし、異なる補完的な調査方法によって得られた結果の組み合わせは、拡張欠陥による影響の物理的性質のより深い理解につながります。
拡張された欠陥の光学特性に関する情報を与えるCL測定では、プロトコルにおける重要なステップが原因財を保証するインジウム箔(の加熱中、試料中の欠陥の望ましくないアニーリングに対する試料位置決め手順(ステップ1.6)であり、試料ホルダーと試料の熱と電気的接触)。提案された手順の代わりRTで導電性銀ペーストにより試料ホルダー上にサンプルをマウントすることです。しかしながら、経験から、ペースト中の有機溶媒は、SEMの走査中、試料表面上の炭素汚染を引き起こすことが知られています。汚染は、EBSD回折パターンならびにCL画像の品質を劣化させます。さらに、ステップ4.21は、シリコンの発光強度の急激な上昇は、サンプルの冷却ダウン中に発生する可能性がある特別な注意が必要です。これは、光電子増倍管の性能に悪影響を与えることができます。予備ミラーアライメントをRTで試験試料で行ったので、逆に、実際のサンプルのために予期しない低い発光強度の場合、1つの集光ミラー(プロトコル番号4.23)の調整を改善することを試みるべきです波長のわずかに異なる範囲。
メソッドのインストゥルメンタルの制限については、1は、その非常に低いtemperatで考慮に入れる必要がありますサンプルとステージが調査中のサンプルの面積を制限x、y方向にのみ±5mmだけ移動することができURES。この制限は、ヘリウム移送管の脆性破壊の危険性に起因します。 1.1と1.2で与えられた低温実験用の試料寸法はまた、実験条件によって制限されています。そのように試料の表面積は、ヒートシンクの最適な熱接触を確実にするために試料ホルダの大きさに調整されるべきです。シリコンサンプルの低推奨厚さは低温実験のために、試料中の温度勾配を制限します。 200μmの試料の厚さについては、表面領域中の一次電子の相互作用体積の中心での温度は、試料ホルダの表面で測定された温度と比較して5未満のKによって増加することが見出されました。高い走査速度とステップ4.5および4.17でのみクールダウン手続きのために提案低倍率、その目を確保関心のE領域は清潔に保たれています。これは、SEMチャンバ内の残留ガスのための凝縮トラップとして作用するサンプル領域の残りの部分の温度より常にわずかに温度を維持し、走査電子ビームによる熱伝達です。一般的に、CL分光法のためのステップ4.24に記載されているすべてのパラメータは、機器のリストに従って設定した実験により、バルクシリコン中のいわゆるD線発光の測定のために最適化されています。発光の研究は他の半導体材料上で実行される場合、パラメータが適合されなければなりません。
観察された発光のエネルギー範囲の独立した、全組換えボリュームに放射再結合プロセスからの光は、このようにミラーによって収集しているので集光ミラーからのCL測定結果のさらなる制限は、対応するグレー値を決定します割り当てであるCLの画像画素試料表面上の電子ビームの位置にED。 (励起体積に匹敵する)組換えボリュームの直径も低倍率の画素サイズよりも大きいので、この効果は、発光シグナルの空間的な汚れを引き起こし、そして、したがって、空間分解能を制限します。それにもかかわらず、CLの調査は、媒体のスペクトル分解能でモノまたはパンクロマチック発光の局所分布のイメージングを可能にし、高いスペクトル分解能を与えるためにフォトルミネッセンスの調査と組み合わせることができます。最近では、測定値をCLに代替実験方法として、転位の顕微鏡と分光マッピングに関連するフォトルミネッセンスは、田島と同僚26のグループによって提案されました。フォトルミネッセンスマッピングの空間分解能は、CLの画像に比べて明らかに低いですが、フォトルミネセンスの調査は、さらに深いレベルの発光バンドカレの偏光を可能にします転位にされた関連のツイストとチルト構造27,28とLAGBsに決定されます。
拡張欠陥の電気的特性への洞察を与えるEBIC調査の場合には、比較的空間分解能を有する半導体材料で局所的に変化する電荷収集効率のイメージングのための代替の方法が存在しません。しかしながら、EBIC測定のために、重要なステップは、プロトコルに含まれています。だから、ステップ5.13で、温度を下げるとEBIC像の変化は、拡張欠陥の温度依存特性から生じると予想されます。しかし、コンタクトの品質を室温以下の温度で変化し、従ってEBIC画像に影響を与えることができます。温度が原因インシリコからコンタクト層を分離する異なる熱膨張係数を、n型シリコンの場合にはp型の場合とAuとAlとの適切な層で作られたショットキー接触に影響しますN基板。また、ガリウム - インジウム共晶によって作られたオーミック接触が160 K.通常より低い温度で安定していない、接触の質の低下がにつながる強く大きな領域のためEBIC信号を減少させました。この場合、連絡先は更新されなければなりません。 RTでEBIC調査のために、EBSD測定のための接触は、適切なキャリアボードにサンプルを結合することによって作製することができることも考えられます。 EBIC測定の他の楽器の限界は、試料表面上のコンタクトチップホルダの突出によって引き起こされます。コンタクトチップホルダーとSEMのポールピース間の衝突を防ぐために、WDは、少なくとも15ミリメートルでなければなりません。
拡張欠陥の長距離歪み場を推定するために使用することができるccEBSD調査のための実験手順では、以下のステップが重要です。実験の最も困難な部分は、試料調製、特に最後の研磨手順(pは付加的な表面欠陥の発生を回避するために慎重に行われなければならないrotocol番号3.1)。何菊地パターンを得ることができない場合は、多くの場合、試料表面の品質が十分ではありません。しかし、塑性変形後の表面上のすべり線を有するシリコン単結晶から、良好な回折パターンはccEBSD評価手順に非常に適してあった得ることができました。これらの試料の表面粗さは、最大500ナノメートルの範囲内の高さの変化を生じる原子間力顕微鏡により分析しました。そのため、非常に高い内部歪み又はアモルファス表面層がぼやけ回折パターンではなく、試料表面の不完全な滑らかさの原因であると思われます。さらなる問題は、バックグラウンドと比較してコヒーレントに散乱された電子からの低い信号である可能性があります。次いで、一定の加速電圧でプローブ電流の増加および/またはバックグラウンドシグナル(プロトコルのステップ番号6.12)Aのより正確な決意参考に再度。長期的なccEBSD測定中の試料の動きを最小限に抑えるために、それは機械的にサンプルを固定することをお勧めします(プロトコル番号3.2)。
入射電子ビームの試料表面の傾きが段の傾斜によって実現される場合ccEBSD調査のためのインストゥルメンタルの制限が生じ得ます。ポールピースとチャンバ壁との衝突の危険性に起因するサンプルの移動のための強力な制限は、次にあります。さらに、強くによるサンプルのエラーのために、まず、垂直走査が内部歪みのために多額のエラーを持っているので、(したがって、SEMの画面上に水平に表示されます)傾斜軸に平行なラインだけスキャンを使用することをお勧めしますチルト。第二に、EBSDの間に、横方向の解像度はそれに垂直より傾斜軸に沿って高い(70°傾斜のための約3倍)です。 ccEBSD調査からSiのために計算されたひずみテンソルコンポーネントの値の下限はありますランダム誤差である2×10 -4。さらにはccEBSD技術は大きな格子回転の存在下では適用できないことを強調しなければならない(> 4°)の基準点を参照し、または異なる粒子のEBSDパターンが重なって粒界に非常に近いです。ひずみ決意の空間分解能に関するccEBSD調査の物理的限界は、試料傾斜軸に沿って約50nmであることが判明した電子線回折の範囲によるものです。内部歪みの決意のX線回折実験と比較して、これが原因であってもX線μ回折の場合にX線のかなり大きな相互作用体積の明らかな利点です。半導体材料は、polarscopeによって等方性の屈折率の摂動の研究はまた、内部応力の決意に適用することができるが、この方法の空間分解能はより低いですいくつかの百nmの29。結晶中の空間分解3次元ひずみ状態の決意ための別の方法は、より高次ラウエ帯(HOLZ)線の分割に基づいています。この方法は、電子干渉計30の電子線バイプリズムを用いた透過型電子顕微鏡(TEM)で実行されなければなりません。しかし、SEMでccEBSD調査とは対照的に、TEM調査は、リラクゼーション効果による内部歪みを変更するサンプルからの箔の準備が必要です。
将来の研究では、ccEBSD測定も低い温度で行われます。これは、同じ拡張欠陥でなく、同じ温度でだけでなく、調査を、構造上の光学的および電気的特性を可能にします。
開示事項
The authors have nothing to disclose.
謝辞
Support of this work by the German Research Foundation (DFG) within the framework of the Research Training Group 1621 is gratefully acknowledged by Paul Chekhonin. All authors are grateful to Dietmar Temmler (Fraunhofer FEP Dresden) for providing the electron beam processed Si samples showing liquid phase re-crystallisation. Special thanks go to Stefan Saager and Jakob Holfeld for the preparation of the figures for the SEM equipment and the EBSD set-up. We thank Michael Stavola for detailed discussions and help with this work.
資料
| Name | Company | Catalog Number | Comments |
| Cryogenic liquids: | Linde http://www.linde-gas.de, Air Liquide http://www.airliquide.de/ | ||
| Liquid helium ( LHe ) | for cooling of the cryostat | ||
| Liquid nitrogen ( LN2 ) | for cooling of the PMT R5509-73 | ||
| Indium wire | chemPUR http://chempur.de/ | 900898 | CL sample preparation: for good electrical and thermal coupling between cryostat and sample |
| Mica | plano GmbH http://www.plano-em.de/ | V3 | isolation of EBIC sample holder and good thermal coupling to the cryostat |
| Aluminium wire, gold wire | chemPUR http://chempur.de/ | 009013, 900891 | purity 99.99%, material for formation of Schottky contact for EBIC measurements |
| Indium-Gallium eutectic solution | Alfa Aesar | 12478 | to form ohmic contact on the backside of the sample for EBIC measurements |
| Liquid chemicalsVLSI Selectipur (de-ionized water, acetone, ethanol) | VWR | 52182674, 51152090 | for sample preparation: cleaning and surface treatment |
| Hydrofluoric acid | VWR | 1,003,382,500 | necessary to remove surface oxide layer on Silicon samples immediately before investigation; follow safety precautions! |
| MicroCloth | Buehler http://www.buehler.com/ | 40-7222 | polishing cloth |
| MasterMet 1 (0.02 µm) | Buehler http://www.buehler.com/ | 40-6380-006 | SiO2 polishing suspension |
| Scanning electron microscope (SEM) | Carl Zeiss AG http://www.zeiss.de/microscopy/ | Ultra 55 | field emission gun |
| SEM-CL system | EMSystems | customized, following equipment belongs to CL system: | |
| SEM stage for cryostat | Kammrath & Weiss http://www.kammrath-weiss.com | ||
| KONTI cryostat | Cryovac http://www.cryovac.de/ | 3-06-4609C-7674 | cooling of sample |
| Liquid He transfer line for KONTI cryostat | Cryovac http://www.cryovac.de/ | 3-01-3506C-SO | |
| Cryogenic Temperature Controller | Cryovac http://www.cryovac.de/ | TIC-304 MA | controlling the flow rate of cryogenic |
| Photomultiplier Tube (PMT) | Hamamatsu http://www.hamamatsu.com | R5509-73 | for NIR spectral range |
| PMT housing and cooler | Hamamatsu http://www.hamamatsu.com | C9940-2 | |
| HV power supply | Heinzinger electronic GmbH http://www.heinzinger.de/ | LNC 3000-10 neg | for operating of the PMT |
| Monochromator | Sol Instruments Ltd. http://www.solinstruments.com | MS2004i | |
| PMT | Hamamatsu http://www.hamamatsu.com | R3896 | for visible spectral range |
| CCD digital camera | Proscan GmbH, Proscan Special Instruments Ltd. http://www.proscan.de | HS 101 H | for visible spectral range |
| Control program | Proscan GmbH, Proscan Special Instruments Ltd. http://www.proscan.de | PSI line | for controlling spectral CL measurements with CCD or PMT detectors |
| Laptop | Dell | Latitude 110L | hardware for running the control program |
| LHe dewar | cryotherm http://www.cryotherm.de/ | Stratos 100 SL | container for cryogenic |
| LN2 dewar | container for cryogenic | ||
| Protective glasses | pulsafe | protective equipment | |
| Protective gloves | tempex | Protect line Mod. 4081052 | protective equipment |
| Heating tape | Thermocax Isopad GmbH http://www.isopad-solutions.com | IT-TeMS 6 | to prevent or reduce icing of the flexible hoses during cooling |
| Diaphragm pump | Vacuubrand GmbH & Co KG http://www.vacuubrand.com | ME4 | to provide the flow rate of the cryogenic |
| Vacuum accessoires: flexible hoses, seals, locking rings | connectors for cryogenic CL or EBIC set-up | ||
| Specimen current EBIC amplifier | KE developments / Deben http://deben.co.uk/ | Type 31 | Measuring the EBIC current |
| High vacuum chamber with metal evaporation | customized | formation of Schottky contact for EBIC measurements | |
| Heating plate | Retsch GmbH http://www.retsch.de | SG1 | CL sample preparation |
| EBSD detector Nordlys | HKL | no more available; can be replaced by the Oxford EBSD detectors NordlysMax3 or NordlysNano | |
| EBSD acquisition and evaluation software Channel 5 | HKL | no more available; can be replaced by the Oxford EBSD Software AZtecHKL | |
| ccEBSD program ccEBSD_v1.07.exe | in house written program | for use please contact authors | |
| EBSD interface with remote control system | Carl Zeiss AG http://www.zeiss.de/microscopy/ | necessary for the electron beam control and parameter transfer between EBSD system and SEM | |
| Vibromet2 | Buehler, http://www.buehler.com/ | 671635160 | vibratory polisher |
参考文献
- Alexander, H. Chapter 6, Dislocations. Electronic Structure and Properties of Semiconductors. Schröter, E. , Materials Science and Technology; 4. VCH Basel. 249-319 (1991).
- Mahajan, S. Defects in semiconductors and their effects on devices. Acta Mater. 48, 137-149 (2000).
- Holt, D. B., Yacobi, B. G. Extended Defects in Semiconductors- Electronic Properties, Device Effects and Structures. , Cambridge University Press. (2007).
- Hornstra, J. Models of grain boundaries in the diamond lattice. Physica. 25 (1-6), 409-422 (1959).
- Randle, V. Crystallographic characterization of planes in the scanning electron microscope. Mater. Charact. 34 (1), 29-34 (1995).
- Wilkinson, A. J., Meaden, G., Dingley, D. J. High-resolution elastic strain measurement from electron backscatter diffraction patterns: New levels of sensitivity. Ultramicroscopy. 106 (4-5), 307-313 (2006).
- Wilkinson, A. J., Meaden, G., Dingley, D. J. High resolution mapping of strains and rotations using electron backscatter diffraction: New levels of sensitivity. Ultramicroscopy. 106 (4-5), 307-313 (2006).
- Drozdov, N. A., Patrin, A. A., Tkachev, V. D. Recombination radiation on dislocations in silicon. JETP Lett. 23 (11), 597-599 (1976).
- Dean, P. J., Williams, G. M., Blackmore, G. Novel type of optical transition observed in MBE grown CdTe. J Phys. D: Appl. Phys. 17 (11), 2291-2300 (1984).
- Nacke, M., Allardt, M., Chekhonin, P., Hieckmann, E., Skrotzki, W., Weber, J. Investigations on residual strains and the cathodoluminescence and electron beam induced current signal of grain boundaries in silicon. J. Appl. Phys. 115 (16), 163511-1-163511-8 (2014).
- Ikeda, K., Sekiguchi, T., Ito, S., Suezawa, M. EBIC and Cathodoluminescence Study of the Bonded Silicon Wafers. Solid State Phenom. 63-64, 481-488 (1998).
- Sekiguchi, T., Ito, S., Kanai, A. Cathodoluminescence study on the tilt and twist boundaries in bonded silicon wafers. Mater. Sci. Eng. B. 91-92 (4), 244-247 (2002).
- Lee, W., Chen, J., Chen, B., Chang, J., Sekiguchi, T. Cathodoluminescence study of dislocation-related luminescence from small-angle grain boundaries in multicrystalline silicon. Appl. Phys. Lett. 94, 112103(2009).
- Donolato, C. Theory of beam induced current characterization of grain boundaries in polycrystalline solar cells. J. Appl. Phys. 54 (3), 1314-1322 (1983).
- Kittler, M., et al. Regular Dislocation Networks in Silicon as a Tool for Nanostructure Devices used in Optics, Biology, and Electronics. Small. 3 (6), 964-973 (2007).
- Kveder, V., Kittler, M., Schröter, W. Recombination activity of contaminated dislocations in silicon: A model describing electron-beam-induced current contrast behavior. Phys. Rev. B. 63, 115208(2001).
- Higgs, V., Lighthowlers, E. C., Norman, C. E., Kightley, P. Characterisation of dislocations in the presence of transition metal contamination. Mater. Sci. Forum. 83-87, 1309-1314 (1992).
- Donolato, C., Bell, R. O. Characterization of grain boundaries in polycrystalline solar cells using a computerized electron beam induced current system. Rev. Sci. Instrum. 54 (8), 1005-1008 (1983).
- Wilkinson, A. J., Meaden, G., Dingley, D. J. chap. 17, Mapping Strains Using Electron Backscatter Diffraction. Electron Backscatter Diffraction in Material Science. Schwartz, A. J., Kumar, M., Adams, B. L., Field, D. P. , 2nd Edition, Kluwer Academics/Plenum Publishers. New York. 231-249 (2009).
- Childs, G. B., Ericks, L. Y., Powell, R. W. National Bureau of Standards. Thermal Conductivity of Solids at Room Temperature and Below: A Review and Compilation of the Literature. , http://digital.library.unt.edu/ark:/67531/metadc13173/m1/1 (1973).
- Yacobi, B. G., Holt, D. B. Cathodoluminescence Microscopy of Inorganic Solids. , Plenum Press. New York. (1990).
- Everhart, T. E., Hoff, P. H. Determination of Kilovolt Electron Energy Dissipation vs Penetration Distance in Solid Materials. J. Appl. Phys. 42 (13), 5837-5846 (1971).
- Zaefferer, S., Elhami, N. N. Theory and application of electron channelling contrast imaging under controlled diffraction conditions. Acta Mater. 75, 20-50 (2014).
- Schulze, G. Metallphysik. , Akademie Verlag. Berlin. (1967).
- Jiang, J., Britton, T. B., Wilkinson, A. J. Evolution of intragranular stresses and dislocation densities during cyclic deformation of polycrystalline copper. Acta Mater. 94, 193-204 (2015).
- Inoue, M., Sugimoto, H., Tajima, M., Oshita, Y., Ogura, A. Microscopic and spectroscopic mapping of dislocation-related photoluminescence in multicrystalline silicon wafers. J. Mater. Sci.: Mater. Electron. 19, 132-134 (2008).
- Kato, G., Tajima, M., Toyota, H., Ogura, A. Polarized photoluminescence imaging analysis around small-angle grain boundaries in multicrystalline silicon wafers for solar cells. Jpn. J. Appl. Phys. 53, 080303(2014).
- Tajima, M. Spectroscopy and Topography of Deep-Level Luminescence in Photovoltaic Silicon. IEEE J. Photov. 4 (6), 1452-1458 (2014).
- Yablon, A. D. Optical and mechanical effects of frozen-in stresses and strains in optical fibres. IEEE J. Sel. Top. Quant. 10 (2), 300-311 (2004).
- Herring, R., Norouzpour, M., Saitoh, K., Tanaka, N., Tanji, T. Determination of three-dimensional strain state in crystals using self-interfered split HOLZ lines. Ultramicroscopy. 156, 37-40 (2015).
転載および許可
このJoVE論文のテキスト又は図を再利用するための許可を申請します
許可を申請さらに記事を探す
This article has been published
Video Coming Soon
Copyright © 2023 MyJoVE Corporation. All rights reserved