Method Article
Caracterização abrangente de Defeitos estendidos em Materiais Semicondutores por um Microscópio Eletrônico de Varredura
Neste Artigo
Resumo
The optical, electrical, and structural properties of dislocations and of grain boundaries in semiconductor materials can be determined by experiments performed in a scanning electron microscope. Electron microscopy has been used to investigate cathodoluminescence, electron beam induced current, and diffraction of backscattered electrons.
Resumo
Extended defects such as dislocations and grain boundaries have a strong influence on the performance of microelectronic devices and on other applications of semiconductor materials. However, it is still under debate how the defect structure determines the band structure, and therefore, the recombination behavior of electron-hole pairs responsible for the optical and electrical properties of the extended defects. The present paper is a survey of procedures for the spatially resolved investigation of structural and of physical properties of extended defects in semiconductor materials with a scanning electron microscope (SEM). Representative examples are given for crystalline silicon. The luminescence behavior of extended defects can be investigated by cathodoluminescence (CL) measurements. They are particularly valuable because spectrally and spatially resolved information can be obtained simultaneously. For silicon, with an indirect electronic band structure, CL measurements should be carried out at low temperatures down to 5 K due to the low fraction of radiative recombination processes in comparison to non-radiative transitions at room temperature. For the study of the electrical properties of extended defects, the electron beam induced current (EBIC) technique can be applied. The EBIC image reflects the local distribution of defects due to the increased charge-carrier recombination in their vicinity. The procedure for EBIC investigations is described for measurements at room temperature and at low temperatures. Internal strain fields arising from extended defects can be determined quantitatively by cross-correlation electron backscatter diffraction (ccEBSD). This method is challenging because of the necessary preparation of the sample surface and because of the quality of the diffraction patterns which are recorded during the mapping of the sample. The spatial resolution of the three experimental techniques is compared.
Introdução
Tem sido conhecido durante décadas que se estendiam defeitos exercer uma influência sobre a estrutura electrónica de materiais semicondutores 1-3. O efeito de defeitos estendidos sobre o desempenho de dispositivos eletrônicos e outras aplicações como sensores e materiais de células solares está sob extensa investigação experimental e teórica. No entanto, não há nenhuma teoria geralmente aceite para o cálculo dos estados electrónicos de semicondutores na presença de defeitos estendidos. Isto é devido à complexidade dos cálculos de estrutura electrónica no caso de desvios da rede cristalina ideal e também para a grande diversidade quanto aos tipos e configuração de defeitos prolongadas, bem como as combinações possíveis entre eles e com 0-dim intrínseca e defeitos extrínseca.
Os principais tipos de defeitos estendidos são luxações (defeitos 1-dimensionais) e limites de grão (defeitos 2-dimensional). No que se segue, que concentrate em ambos os tipos de defeitos estendidos em termos das experiências que podem ser realizadas ao microscópio electrónico de varrimento (SEM). Os métodos experimentais aqui apresentados dão informações sobre as propriedades estruturais, ópticas e elétricas de defeitos estendidos e, portanto, conhecimento indireto dos estados eletrônicos em materiais semicondutores que contêm defeitos estendidos. O controle dos estados eletrônicos relacionados a defeitos é uma questão central para a aplicação de semicondutores ea operação de dispositivos semicondutores.
Para a investigação estrutural de defeitos estendidos, o retroespalhamento de elétrons de difração (EBSD) técnica pode ser aplicada. Normalmente, uma medição EBSD é realizada através de mapeamento com um ponto de feixe de electrões em cada ponto estacionário. EBSD proporciona então informações sobre a orientação cristalográfica da rede cristalina da amostra, no caso de material monocristalino e dos grãos de material policristalino. for esse fim, os padrões de difracção de determinados experimentalmente formados pelas bandas Kikuchi têm de ser analisados por comparação com padrões determinados simulados a partir do grupo espacial de cristal do material. Se o software para a avaliação dos dados de orientação é capaz de calcular o ângulo misorientation entre os sistemas de coordenadas cristalográficas de pontos vizinhos de mapeamento, pode ser determinado o tipo de limite do grão entre eles. Se o ângulo misorientation é menor do que 15 °, um limite baixo ângulo de grãos (LAGB) está presente; caso contrário, é um contorno de grão alto ângulo (HAGB). O tipo de HAGB é caracterizada pelo seu valor Σ onde Σ -1 é a fração de pontos da rede encontram-se em uma estrutura coincidência. Assim, Σ = 3 stands para a fronteira duplo altamente simétrica 4. Se o mapeamento EBSD em dois planos da superfície da amostra pode ser medido com um conhecimento preciso das posições dos mapeamentos, do tipo do plano w de limite do grãoom índices de Miller HKL também pode ser avaliada por um método proposto por Randle 5.
Recentemente, um novo procedimento para a avaliação de um padrão de difracção de electrões foi derivado por Wilkinson et ai 6, que permite o cálculo de todos os componentes do tensor estirpe local completa,. Isto é., Os valores absolutos das três estirpe normais e de uma estirpe de três cisalhamento componentes. Este cálculo é efectuado para cada ponto de medição em um mapeamento a partir do padrão de difracção correspondente em relação a um padrão de referência tomada em uma região de cristal sem tensão com a mesma orientação cristalográfica. Este processo de avaliação é baseado na determinação de pequenas mudanças de aspectos característicos do padrão EBSD usando a técnica de correlação cruzada que dá o nome ccEBSD. Em relação a um ponto de referência escolhidos, os componentes de deformação e rotações de treliça pode ser medido com precisões de 10 -4 e 0,006 & #176 ;, respectivamente 7. Aplicando ccEBSD medições em linha verifica através das fronteiras de grão, ou ao longo de arranjos de deslocamentos, pode-se determinar a quantidade localmente, bem como a gama dos campos de deformação destes defeitos estendidos.
As propriedades ópticas de deslocamentos e as fronteiras de grão pode ser investigada por técnicas de imagiologia espectral e catodoluminescência (CL). O sinal de luminescência é causada pela recombinação radiativa de pares de electrões buracos que são geradas no material semicondutor pelo feixe de electrões primários do SEM. A intensidade da luminescência é proporcional à eficiência de recombinação de irradiação, que é a razão entre o tempo de vida total portadores minoritários ao tempo de recombinação radiativa. Quando esta relação é influenciada localmente por defeitos, um contraste na distribuição de luminescência pode ser observado nas imagens CL. Normalmente, defeitos estendidos agir como não-radiativos centros de recombinação e, portanto, a Luminescence de banda-banda-recombinação é diminuída na vizinhança de defeitos estendido, em comparação com o semicondutor sem perturbações. No entanto, no caso de Si, Ge e alguns materiais semicondutores compostos, em luxações, bem como em fronteiras de grão, bandas de luminescência característicos são observados, indicando energias de fotões inferiores do que a da recombinação (directa ou não-directa) banda-de-banda no material em bruto 8-10. Como exemplo, extensas investigações CL de wafers de silício ligados e de silício multi-cristalino por Sekiguchi e colegas de trabalho 11-13 revelou que luxações e LAGBs são responsáveis pela ocorrência de níveis superficiais e profundas na folga de banda. As transições radioativas correspondentes são indicadas como D linhas nos espectros de CL. No entanto, o papel do campo de deformação que acompanha arranjos de deslocamentos e de contaminação por luxação precipitação oxigénio e impurezas de metais de transição é ainda controversa para o interpretation da luminescência linha D. Mas, se uma atribuição da posição de energia de linha de luminescência a um defeito estendida distinta pode ser feita com sucesso, em seguida, a ocorrência desta linha específica no espectro de luminescência pode ser tomado como um sinal para a presença desse defeito. Para aumentar a intensidade de luminescência, isto é., A recombinação radiativa em relação à outra não radiativa, investigações CL tem que ser realizada a temperaturas baixas (Cryo-CL) para materiais semicondutores com as estruturas de banda indirectos.
As propriedades elétricas dos defeitos estendidos aqui considerados são caracterizados pela imagem da corrente induzida por feixe de elétrons (EBIC) na SEM. Esta corrente pode ser observado quando os pares de electrões-furo geradas pelo feixe de electrões primários são separadas por um campo eléctrico embutido. Este campo pode ser gerado pelo potencial eléctrico dos próprios defeitos extensos ou por contactos Schottky na superfície da amostra. A imagem EBICcontrastam resultados de variações locais da eficiência da carga de coleta devido a um comportamento recombinação variando de defeitos eletricamente ativos. Os defeitos estendidos geralmente mostram um aumento da recombinação transportadora para que eles aparecem mais escuras em uma imagem EBIC do que as regiões livres de defeitos. No âmbito de modelos baseados fisicamente defeitos de 14, uma avaliação quantitativa da dependência espacial do sinal EBIC, que é chamado perfil contraste, permite a determinação do comprimento de difusão dos portadores minoritários e tempo de vida, bem como a velocidade de recombinação de superfície. Uma vez que estes parâmetros são dependentes da temperatura, investigações EBIC também deve ser realizada a baixa temperatura (Cryo-EBIC) para obter um sinal melhorado para relação de ruído. Em alternativa, medições de temperatura EBIC dependentes permitir a determinação da concentração de impurezas no nível profundas deslocamentos de acordo com um modelo que foi proposto por Kittler e co-trabalhadores 15,16.
Deve notar-se que as propriedades ópticas e eléctricas de defeitos extensos em semicondutores pode ser influenciada de forma significativa pela contaminação e pelos defeitos intrínsecos 0 dim-17, que não podem ser resolvidos por microscopia de varrimento de electrões. No entanto, a combinação dos métodos experimentais, ccEBSD, CL e EBIC, oferece a oportunidade de visualizar os defeitos extensos e para quantificar as suas propriedades fundamentais no SEM. Para futuras aplicações, onde não só análise de falha, mas também o controlo e o defeito engenharia defeito se destinam, esta ferramenta poderosa vai desempenhar um papel importante no melhoramento do desempenho de dispositivos semicondutores.
Protocolo
1. Preparação de Amostras para Cryo-CL Experiment
- Utilize uma amostra a granel de material semicondutor (aqui: silício) com uma superfície plana, uma superfície máxima de 5 x 5 mm e uma espessura no intervalo entre 0,2 e 0,5 mm.
- Limpar a amostra e o suporte de amostra com solventes orgânicos tais como etanol ou acetona. Remover a camada de superfície de óxido de silício na amostra por uma imersão em uma solução de ácido fluorídrico (40%) e água desionizada numa proporção de 01:10 durante 1 min. Lavar a amostra com água deionizada.
- Moinho de um pedaço de fio de índio mecanicamente para formar uma folha de índio com uma área de superfície que corresponde à da amostra e com uma espessura de cerca de 0,5 mm.
- Montar o porta-amostras de 60 ° -Pré-inclinada em um soquete metálico, colocar a folha de índio no suporte da amostra e da amostra no topo.
- Coloque a tomada sobre uma placa de aquecimento.
- Ligue a placa de aquecimento, temperatura da tomada de controle com um thermometeR e aquecer a tomada até 150 ° C, de modo que o processo de fusão da película de índio é iminente.
Nota: Não é necessário que o índio atinge o ponto de fusão a 157 ° C, mas a folha deve ser dúctil. - Fixar a amostra sobre a folha de índio, pressionando a amostra com um palito de madeira por 1 segundo.
- Desligue a placa de aquecimento e arrefecimento todo o sistema por cerca de 30 min.
2. Preparação de Amostras para Cryo-EBIC Experiment
- Utilize uma amostra a granel de material semicondutor (aqui: silício) com uma superfície plana, uma superfície máxima de 5 x 5 mm e uma espessura no intervalo entre 0,2 e 0,5 mm.
- Limpar a amostra e o suporte de amostra com solventes orgânicos tais como etanol ou acetona. Remover a camada de superfície de óxido de silício na amostra por uma imersão em uma solução de ácido fluorídrico (40%) e água desionizada numa proporção de 01:10 durante 1 min. Lavar a amostra com água deionizada.
- Monte o sample em um sistema de metalização e evapora-se de metal (por ex., Al em p-tipo Si, Au em n-Si tipo) sobre a superfície superior da amostra de modo a formar uma Schottky-contacto.
- Depositar uma gota de gálio-índio eutética fluido na parte de trás da amostra de silício e esfregaço-o para produzir um contacto óhmico.
3. Preparação de Amostras para Experimentos ccEBSD
- Prepare uma superfície de amostra plana através da aplicação de uma sequência de afiação e polimento passos com a diminuição do tamanho das partículas de afiação e polimento agentes (por exemplo., A primeira pasta de diamante de 3 mm em uma folha de papel, em seguida, pasta de diamante de 1 um, o último polimento em um polidor vibratória com suspensão de polimento). Lavar a amostra com água deionizada entre cada passo.
- Terminar a preparação de superfície por limpeza da amostra em etanol num banho de ultra-sons durante 3 min.
- Fixar a amostra a um porta-amostras metálico através de fixação mecânica ou por colagem com um adesivo de duas faces Cguia Arbon.
4. executa a experiência Cryo-CL
- Assegurar a disponibilidade de criogênios como azoto líquido (LN) e hélio líquido (LHE) por um período experimental de 8 horas.
- Use o estágio crio na SEM.
- Insira o espelho de luz de recolha de elíptica a partir da posição de estacionamento para a posição para o SEM medição.
- Montar uma amostra de teste (aqui: a granel amostra de GaAs) com uma transição gap direto no palco.
- Evacuar a câmara SEM até que a válvula de câmara coluna abre. Defina o SEM aceleração parâmetros de imagem de alta tensão (HV) a 20 kV, o tamanho da abertura de 240 mm, o modo atual de alta ON, a velocidade de verificação do feixe de elétrons a 1, a ampliação para 200 ea redução de ruído para média pixel.
- Use o detector Everhart Thornley para imagens com elétrons secundários. Mover o estágio para a peça polar até que o feixe de electrões pode ser focado sobre a superfície da amostra a uma distância de trabalho (WD) de 15 mm.
- Execute o procedimento de inicialização do sistema de detecção CL ao ligar a fonte de alimentação para o monocromador, a fonte de alimentação de alta tensão para o tubo fotomultiplicador (PMT), o sistema de refrigeração PMT eo laptop com o programa de controle CL. Inicie o programa de controle CL e escolha medição do sinal PMT vs. tempo.
- Definir valores apropriados para o contraste (máximo) eo brilho (46%) do PMT.
- Criar um arquivo de log para gravar as experiências.
- Ajustar o espelho de luz coleta para maximizar a intensidade CL integral sobre a amostra de teste pela inclinação e rotação do espelho. Grave um espectro de teste CL usando o programa de controle CL.
- Ventilar a câmara SEM, remover a amostra de teste, montar a amostra real na folha de índio no suporte da amostra e evacuar a câmara SEM.
- Ligar a saída para gases criogénicos do SEM com a entrada de uma bomba de diafragma por tubos de vácuo flexíveis. Use anéis de centragem com um anel de vedação como um elemento de vedação e corrigir-o com os anéis de aperto. Estabilizar o sistema mecanicamente por integração de um peso de amortecimento no acoplamento de mangueira.
- Ligue a saída da bomba de diafragma de vácuo por um tubo flexível a um sistema de recirculação Ele se estiver disponível. Use anéis de centralização com um o-ring como um elemento de vedação e fixar com anéis de fixação.
- Ligue o sensor de temperatura da unidade de controlo de temperatura com o conector adequado na fase SEM. Ligar a fonte de alimentação da unidade de controlo da temperatura.
- Montar fita de aquecimento no tubo flexível de vácuo ao lado da válvula de escape para os gases criogénicos de SEM.
- Usar óculos de proteção e luvas de protecção. Insira a tubulação para o líquido Ele no LHe Dewar. Ligue a saída do tubo de transferência Ele com a entrada para os gases criogénicos do crio-fase do SEM.
- Defina o HV parâmetros do feixe de elétrons para 20 kV, o tamanho da abertura de 240 mm, o modo atual de alta ON, a velocidade de verificação do elétronfeixe a 1, a ampliação para 200 ea redução de ruído para média pixel.
- Use o detector Everhart Thornley para imagens com elétrons secundários. Mover o estágio para a peça polar e focar o feixe de electrões na superfície da amostra na WD = 15 mm para as experiências CL.
- Escolha da área de interesse na superfície da amostra e verificar em toda a região, durante todo o processo de arrefecimento para baixo. Certifique-se de que, durante todo o experimento CL da superfície da amostra na região de interesse é a WD = 15 mm x um posicionamento adequado do palco.
- Iniciar o processo de arrefecimento para baixo, introduzindo a menor temperatura do alvo (por ex., 5 K) e apropriados parâmetros para o controlo PID para o controlador de temperatura de acordo com o manual técnico. Abrir a válvula do tubo de transferência LHe.
- Monitorar a temperatura da amostra, a pressão Ele da bomba de diafragma, e a integral de saída do sinal CL da PMT durante o procedimento de arrefecimento para baixo. Reduce a largura da fenda do monocromador se a intensidade de CL torna-se demasiado elevada a baixas temperaturas para evitar danificar o PMT.
- Aumentar o orifício do tubo de transferência LHe se necessário, para atingir a temperatura alvo.
- Restabeleça a WD = 15 mm para imagens focadas depois de atingir a temperatura alvo. Corrigir o ajuste do espelho de luz coleta para o máximo de intensidade CL integrante na amostra real.
- Defina os valores adequados para a grade (300 linhas por mm, chama a 1.000 nm), região espectral (1.050 a 1.600 nm), largura do passo (5 nm), tempo por ponto de medição (5 seg) e fenda de largura (1 mm) para medições CL espectrais na amostra de silício. Grave CL espectros da amostra, utilizando o programa de controle CL e guardá-las para o disco rígido do laptop.
- Escolha o espelho planar no monocromador para imagens CL pancromática e uma chama ralar em determinado comprimento de onda para a imagem latente CL monocromática, respectivamente. Ajustar o brilho eo contrasteOs valores de CL a imagem na gama linear da dependência dos valores de cinzento do sinal PMT.
- Ajustar a resolução da imagem apropriada (por exemplo., 1.024 x 768 pixels), velocidade de digitalização e método de redução de ruído para imagens CL (por exemplo., Para uma ampliação na faixa entre 200 e 1.000 a menor velocidade de digitalização 14 combinado com média pixel, ou digitalização superior velocidade de 8 combinada com a linha média mais de 20 linhas). Gravação de imagens CL com o programa de controle SEM e guardá-las para o disco rígido do computador.
- Insira o nome e os parâmetros de cada espectro e da imagem medido durante toda a sessão de medição para o arquivo de log.
- Desligue o HV do feixe de elétrons e fechar a válvula de câmara de coluna SEM antes de alterar a temperatura da amostra, inserindo uma temperatura alvo maior para o controlador de temperatura para temperatura investigações CL dependentes.
Nota: Isto é para evitar um desligamento do canhão de elétrons por instabilidades do SEM câmara de vácuo during aquecimento-up. - Abra a válvula de câmara de coluna SEM e ligue o HV quando a nova temperatura alvo é atingida e o vácuo do sistema na câmara SEM é estável novamente.
- Desligue o HV do feixe de elétrons, fechar a válvula de câmara de coluna SEM, fechar o obturador para a PMT, desligue a fonte de alimentação e mais frio do PMT e executar o procedimento de warm-up depois de terminar as medições CL planejadas em baixas temperaturas.
- Remova os dispositivos e ferramentas adicionais que foram montados para o experimento crio-CL sem abrir a câmara SEM.
- Deixe a câmara SEM fechada por pelo menos 12 horas. Verificar para assegurar que a temperatura do suporte de amostra é a TA. De outro modo, aquecer o suporte de amostras para a TA antes de abrir a câmara de MEV.
Nota: Isto é para evitar a humidade na câmara de SEM. - Retirar a amostra do palco e evacuar a câmara de MEV.
5. executa a experiência Cryo-EBIC
- en-se que a disponibilidade de LHe por um período experimental de 8 horas.
- Use o estágio crio na SEM.
- Assegure-se que uma placa de mica está disponível com uma camada de Au evaporado na superfície superior.
- Pilha no suporte de amostras em primeiro lugar o pedaço de mica com Au camada para cima e, em seguida, a amostra real na mica com Schottky-contact para cima. Coloque uma ponta de contacto sobre a Schottky contato da amostra real e o outro sobre a camada de Au evaporado da mica.
- Evacuar a câmara SEM até que a válvula de câmara coluna abre. Defina os valores adequados de redução SEM parâmetros de imagem HV, tamanho da abertura, velocidade de digitalização, ampliação e ruído.
- Ligue o amplificador de corrente de amostra e escolher a faixa de medição de modo a que são exibidos três casas decimais do actual espécime.
- Criar um arquivo de log para gravar as experiências.
- Execute as etapas 4,12-4,16 das experiências crio-CL.
- Defina os valores apropriados do SEM parâmetros HV, tamanho da abertura, ampliação, velocidade de digitalização, e o método de redução de ruído para a imagem EBIC (faixa recomendada de parâmetros para a imagem latente EBIC de limites de grão são de 10 a 20 kV para HV, 20 a 60 mm para o tamanho da abertura, de 30 a 1.000 para a ampliação, de 9 a 14 para a velocidade de digitalização e pixel ou média frame).
- Use o detector de corrente de amostra para geração de imagens EBIC. Mover o estágio para a peça polar e focar o feixe de electrões para um WD no intervalo entre 15 e 25 mm.
- Escolha da área de interesse na superfície da amostra e verificar em toda a região de interesse ao longo de todo o processo de arrefecimento para baixo.
- Iniciar o processo de arrefecimento para baixo, introduzindo a menor temperatura do alvo (por ex., 200 K) e apropriados parâmetros para o controlo PID para o controlador de temperatura de acordo com o manual técnico. Abrir a válvula do tubo de transferência LHe.
- Monitorar a temperatura da amostra ea pressão Ele partir da bomba de diafragma durante legaling-down.
- Dividir a tela SEM e monitorizar o sinal de electrões secundários a partir do detector de Everart Thornley em paralelo para o sinal EBIC a partir do detector de corrente de amostra para assistir a variação das imagens com a temperatura.
- Re-ajustar o SEM parâmetros HV, tamanho da abertura, ampliação, velocidade de digitalização, e redução de ruído para obter imagens EBIC de alto contraste. Re-ajustar também a faixa de medição do amplificador de corrente de amostra para evitar a exibição de estouro a baixas temperaturas.
- Re-focar o feixe de electrões, após atingir a temperatura alvo.
- Grave as imagens EBIC. Insira o nome e os parâmetros de cada imagem no arquivo de log.
- Desligue o HV do feixe de elétrons e fechar a válvula de câmara de coluna SEM antes de alterar a temperatura da amostra, inserindo um valor mais alto de temperatura alvo para o controlador de temperatura para temperatura investigações EBIC dependentes. Abra a válvula de câmara de coluna SEM e ligue o HV quando o novo te-alvomperatura é atingido e o sistema de vácuo é novamente estável.
- Desligue o HV do feixe de elétrons, fechar a válvula de câmara de coluna SEM e executar o procedimento de warm-up depois de terminar as medições EBIC planejadas em baixas temperaturas.
- Remova os dispositivos e ferramentas adicionais que foram montados para o experimento crio-EBIC sem abrir a câmara SEM.
- Deixe a câmara SEM fechada por pelo menos 12 horas. Verificar para assegurar que a temperatura do suporte de amostra é a TA. De outro modo, aquecer o suporte de amostras para a TA antes de abrir a câmara de MEV.
- Retirar a amostra do palco e evacuar a câmara de MEV.
6. realização de experimentos ccEBSD
- Monte da amostra dentro de uma pequena ou vice-sobre o pino de um suporte de amostras que é pré-inclinado no intervalo entre 65 ° e 70 ° relativamente à direcção do feixe de electrões.
- Como alternativa, colocar a amostra no palco eucentric 6 eixo no SEM e incline ofase inteiro de modo que a superfície de uma amostra normal e a direcção do feixe de electrões formam um ângulo na gama entre 65 ° e 70 °. Assegure-se que a fase não irá colidir com os detectores e as paredes da câmara.
- Evacuar a câmara SEM até que a válvula de câmara coluna abre. Defina os valores apropriados do SEM parâmetros de imagem HV (20 kV), abertura (120 mm), o modo de alta corrente ON, velocidade de digitalização (eg., 5), ampliação (por exemplo., 3000) e redução de ruído (média pixel).
- Focar o feixe de electrões na superfície da amostra na WD no intervalo entre 12 e 22 mm.
- Desligar a tensão de aceleração de feixes de electrões e fechar a válvula de câmara de coluna.
- Ligue a fonte de alimentação para o detector EBSD. Mova o detector EBSD da posição de estacionamento para a posição de medição na câmara SEM.
- Abra a válvula de câmara de coluna e ligar a tensão de aceleração de feixes de electrões. Re-focar o feixe de electrões sobre uma região dejuros sobre a superfície da amostra.
- Abra o software de controle EBSD e carregar o arquivo de calibragem do WD escolhido.
- Configure a medição no software de controle EBSD de acordo com o manual de operação.
- Realizar a aquisição de fundo de acordo com o manual de operação EBSD.
- Ler a posição do centro do padrão EBSD e a distância para o detector de WD escolhido a partir do software de controlo EBSD.
- Focar o feixe de electrões numa região da amostra adjacente à região de interesse para as medições reais. Deixar o feixe para fazer a varredura lá por cerca de 1 hora para a estabilização.
- Verifique a quantidade de desvio de feixe, que não deve exceder mais de 1 mm durante toda a medição EBSD.
- Navegue o feixe de elétrons para a região de interesse e re-foco.
- linha de programar verificações paralelo ao eixo de inclinação da região de interesse. Use o mapeamento do feixe (não encenar mapeamento) definição. Selecione os valores apropriados para o número de sPTE (por exemplo., 100), tamanho de passo (por exemplo., de 50 nm), o tempo de exposição (por ex., 43 ms), armação média (por exemplo., 10) e um detector de criação de faixas (por ex., 2 x 2).
- Certifique-se de selecionar "salvar todas as imagens". Desactivar a indexação para acelerar a medição.
- Executar verificações de linha até o último verificação for concluída.
- Desligar a tensão de aceleração de feixes de electrões e fechar a válvula de câmara de coluna.
- Retrair o detector EBSD a partir da posição de medição para a posição de estacionamento e desligue a unidade de controle EBSD.
- Ventilar a câmara, retire a amostra e evacuar.
7. Análise de CL-dados:
- Verifique a calibração grade comparando as posições espectrais de linhas espectrais conhecidas (por exemplo, picos de linhas de luminescência da amostra para ensaio em massa e GaAs unstrained com os dados da literatura) e modificar a calibração de comprimento de onda, se necessário.
- Corrigir os espectros CL gravada (int ensity vs comprimento de onda), em relação à sensibilidade dependente do comprimento de onda do sistema óptico que é composto por chama ralar e PMT dividindo a intensidade medida pelo valor de sensibilidade correspondente a cada ponto de medição.
- Extrair o valor de cinzento de cada pixel da imagem um CL e calcular a média dos valores cinzentos para cada região de interesse na imagem, pelo menos, na escala de interacção de electrões o volume na amostra.
- Determinar a intensidade de CL para a região de interesse a partir de uma curva de calibração dos valores de cinzento médio do CL imagens, dependendo da intensidade de CL em determinados valores de contraste e de brilho do PMT.
- Avaliar a intensidade média CL I CL de toda a imagem CL eo sinal escuro Eu 0 do detector CL.
- Calcule o contraste C CL entre as regiões que aparecem brilhantes e escuras na imagem CL pela seguinte equação:
d / 53872 / 53872eq1.jpg "/>
8. Análise do EBIC-data:
- Extrair o valor de cinzento de cada pixel de uma imagem EBIC e calcular a média dos valores cinzentos para cada região de interesse para quantificar variações espaciais da intensidade EBIC em termos de um contraste EBIC.
- Determinar o perfil de contraste EBIC a partir dos valores de cinza espacialmente resolvidos devido a C. Donolato e RO Sino 18.
- Calcule a área e variância dos perfis de contraste EBIC.
- Determinar parâmetros físicos, tais como o comprimento de difusão e a velocidade de recombinação superfície de portadores de carga minoritária da área calculada e a variância do perfil de contraste EBIC de acordo com as regras estabelecidas pelo Donolato 14.
9. Análise de Experimentos ccEBSD
- Utilizar o software "ccEBSD" in-house escrita programado por Paul Chekhonin para a avaliação dos padrões gravados EBSD.
- Escolha uma appropriatpadrão EBSD e que atuará como o padrão de referência a partir de um ponto de medição que deve estar localizado em uma área de amostra ausentes das estirpes.
- Aplicar pelo menos 15 regiões amplamente distribuídos de juros sobre o padrão.
- Use as coordenadas do centro do padrão e a distância detector que foram determinados pelo software de controlo EBSD para a avaliação adicional.
- Digite o restante dos parâmetros relevantes para a avaliação, ie., As constantes elásticas do material analisado, o número de etapas na linha de varredura e tamanho do passo, o tamanho do detector e sua resolução em pixels, detector e os espécimes de inclinação ângulos, bem como o detector binning.
- Use de um filtro de passagem de banda durante o cálculo da transformação de Fourier 2-dimensional (filtro interno de 6 pixels e filtro exterior de 40 pixels).
- Execute o programa de avaliação.
- Ler os resultados numéricos do arquivo de texto de avaliação "protocol.txt" usando um programa de planilha convencional wuando a finalização do cálculo.
Resultados
As propriedades estruturais, elétricas e ópticas de defeitos estendidos em um material semicondutor foram estudados por diferentes métodos experimentais no microscópio eletrônico de varredura. Geralmente, é possível investigar essas propriedades na mesma amostra, e com alguns esforços com vista à preparação da amostra, mesmo em um defeito único distinta como um contorno de grão ou de um acordo localizada de deslocamentos. No entanto, deve notar-se que, devido aos produtos específicos de interacção do feixe de electrões principal com o material semicondutor utilizado para a inspecção das propriedades defeito físico, a resolução espacial que pode ser alcançado pelo CL, EBIC ou ccEBSD investigações difere um do outro. Na Figura 1, os esquemas são dadas para um set-up adequado do SEM adequados para as medições CL a baixas temperaturas (Figura 1A), o conjunto de investigações EBIC (Figura 1B ), bem como o esquema dos principais elementos de hardware necessários para testes (cc) EBSD (Figura 1C).
Todos os resultados representativos dadas aqui são obtidos para o silício como uma vitrine para um material semicondutor com estrutura de banda eletrônica indireta. Esta estrutura de banda impede todas as medições de luminescência devido à baixa probabilidade de as transições radiativas em comparação com semicondutores com estruturas gap direto. Para realizar intensidade luminescente suficiente para obter resultados estatisticamente assegurados é um desafio. No que se segue, os procedimentos experimentais estão descritas para a investigação de deslocamentos induzidas por deformação plástica, bem como por líquidos de fase re-cristalização a partir de monocristais de silício. Além disso, as investigações sobre um silicone bi-cristal com contornos de grãos individuais e um contorno de grão de ângulo baixo são apresentados.
A Figura 2A mostra um exemplo do posicionamento adequado de uma amostra sobre a folha de índio para garantir um bom contacto térmico para o suporte do crio-amostra na qual a temperatura é medida pelo termopar. Foi comprovado experimentalmente que para o silício, uma espessura da amostra de cerca de 200 a 500 um é bem adequado para investigações de crio-CL a temperaturas inferiores a 5 K. O CL espectros apresentados na Figura 2B foram medidos para um único cristal de Si no estado virgem , após a deformação plástica e após um recozimento adicional. O feixe de elétrons no SEM foi executado em um elétron tensão de aceleração de feixe de 20 kV e uma corrente de sonda de cerca de 45 nA no modo de exploração desfocado, o que resulta em uma intensidade alta CL devido ao elétron-buraco geração de par em um grande volume ( cerca de (450 x 250 x 3) mm 3) com densidade de excitação moderada. Neste modo de digitalização, a superfície da amostra é realmente sobre WD = 15 mm, mas eletronicamente um WD = 0 é ajustado. para CG imagiologia, é claro, o feixe de electrões tem de ser focado o que produz um diâmetro do ponto do feixe de electrões na superfície da amostra de alguns nm, mas com a mesma profundidade de penetração de alguns mm para os electrões primários como no modo de exploração desfocado. O tempo de aquisição por imagem com uma resolução loja de 1.024 x 768 pixels foi de cerca de 10 minutos no modo de média de pixels a uma velocidade de varredura 14 do feixe de elétrons. Foi calculada e confirmado experimentalmente que, para o modo de digitalização desfocado da temperatura da região da amostra sob investigação é aumentada não mais do que alguns 0,1 K de energia por transferência de calor devido ao feixe de electrões. No modo focado, o aquecimento da amostra local depende fortemente da condutividade térmica que por sua vez depende da dopagem amostra e a temperatura em si 20. Para o flutuador zona crescido amostra Si, P-dopado com boro a uma concentração de 10 15 cm -3, no modo de varrimento focado, um local de aumento de temperatura AT decerca de 2 K ocorreu a uma temperatura de 5 K criostato, e de AT ≈ 0,3 K a 25 K.
Para estudar as propriedades ópticas dos deslocamentos, uma amostra de Si a granel foi submetido a uma deformação plástica a uma pressão de 16 MPa a 800 ° C, seguido por um segundo passo de deformação a 295 MPa a 420 ° C. As linhas de deslizamento, mostrado na Figura 2C sobre a superfície de uma parte da amostra deformada, são causados por processos de deslocamento de deslizamento em dois diferentes planos de deslizamento orientados 111. As linhas de deslizamento podem ser visualizados por elétrons retroespalhados (BSE). As linhas de deslizamento indicar os traços das Grades de aviões em que a maioria dos deslocamentos são alinhados. CL imagens monocromáticas (mono-Cl) (Figuras 2D e 2E) foram adquiridos em posições energéticas das bandas de luminescência D4 e D3 e não sofrem de forma significativa a partir do perfil da topografia da superfície causada por linhas de deslizamento. Este foi verificada por CL investigações aepois de um polimento de superfície cuidado que mostrou o mesmo padrão de distribuição de luminescência quase inalterada como na superfície da amostra originalmente ondulado, onde os padrões de listras intensidade CL são paralelos aos traços plano de escorregamento. Se está prevista a analisar a distribuição local da intensidade da luminescência CL quantitativamente a partir da imagem, então a imagem CL tem de ser registada na gama linear da relação entre o sinal CL e valor de cinza. Essa relação pode ser determinada experimentalmente medindo a correlação entre valor de cinza imagem e sinal absoluto do fotomultiplicador em determinados valores de contraste e brilho para o detector. Pelo contrário, se se pretende visualizar pequenas variações de intensidade de CL na superfície da amostra, em seguida, para obter os melhores resultados, um valor relação sinal-para-cinzento não-linear deve ser já aplicado durante o processo de formação de imagens de SEM. A resolução espacial de uma imagem CL em uma amostra a granel de Si a baixas temperaturas é determinado pelo tamanho da interacçãovolume dos electrões primários na amostra, porque o tamanho deste volume interacção é apenas marginalmente menor do que o volume para a recombinação de irradiação dos pares de electrões-orifício 21. O diâmetro do volume de interacção de um feixe focado e estacionário é de cerca de 3 micrómetros sob as dadas condições experimentais 22.
A estimativa do campo de deformação em torno defeitos estendidos por ccEBSD requer a gravação de padrões de Kikuchi com qualidade suficiente, mesmo em regiões da amostra altamente tensas. Um exemplo é dado na Figura 3A. Para obter esses padrões, a superfície da amostra deve ser livre de camadas superficiais indesejáveis (óxidos, contaminação de carbono, etc.). Bons resultados podem ser conseguidos com os seguintes parâmetros experimentais: feixe de electrões a 20 keV e 12 nA, inclinação da superfície amostra normal entre 60 ° e 70 ° para o feixe incidente na WD = 15 mm, 2 x 2 EBSD Detebinning ctor pixel, que produz uma resolução de 672 x 512 pixels, o ganho de amplificação do sinal ajustada para elevada, o tempo de exposição entre 20 e 43 mseg por quadro no detector EBSD, calculando a média de cinco a dez quadros por ponto e o armazenamento do Kikuchi medindo padrão como imagens para cada ponto de medição, sem indexação. O tempo de aquisição total para um padrão de Kikuchi pode ser calculada a partir do tempo de exposição, multiplicado pelo número de quadros mais alguns 10 ms, devido ao tempo necessário para o deslocamento do feixe, a leitura e armazenamento. Um valor de 50 nm acabou experimentalmente para ser um bom tamanho mínimo de etapa entre duas posições de amostra dentro do mapeamento EBSD. Isto está de acordo com as recentes considerações teóricas 23 relativos a resolução viável para contraste difração de elétrons. Para evitar a deriva feixe durante o mapeamento EBSD, recomenda-se esperar pelo menos 15 minutos com a varredura de feixe na vizinhança imediata da região de interesse antes de executar o mapa.Verificou-se que apenas uma linha de EBSD verifica paralelamente ao eixo de inclinação amostra fornecer dados de deformação realista com um padrão de referência sobre a mesma linha. Caso contrário, é necessária uma determinação muito cuidado de o ângulo de inclinação da amostra real, ou em alternativa, o comprimento de uma linha de exploração perpendicular ao eixo de inclinação deve ser limitada a alguns mícrons.
O padrão de Kikuchi armazenado como JPEG 8 bits foram avaliadas pela transformação de Fourier (FT) e correlação cruzada com um "ccEBSD" programa escrito por um dos autores (PC). O programa baseia-se no algoritmo desenvolvido por Wilkinson et ai 6, descrita em pormenor na ref. 19. No padrão Kikuchi, vários (15-19) sub-padrões (128 x 128 pixels) têm de ser definidos com características como cruzamentos faixa brilhante (Figuras cf. 3A e 3B). Todos os sub-padrões têm de ser analisadas por FT. Um filtro passa-banda tem que ser aplicada a todas as imagens FT (raio interno 6 pixels para baixas frequências, raio externo 40 pixels para frequências mais elevadas) para definir todos os valores a zero fora do filtro de passagem de banda no espaço Fourier (cf. Figura 3C). Em seguida, a função de correlação cruzada (cc) (Figura 3D) tem de ser calculada entre a FT de cada sub-padrão com o respectivo FT do sub-padrão (Figuras 3E e 3F) a partir do padrão de referência Kikuchi. A partir das posições dos picos nos cc-funções (Figura 3D), podem ser determinados os deslocamentos relativos das sub-padrões. Usando estes deslocamentos, os componentes normais e de corte de tensão pode ser calculado. Se as constantes elásticas dependentes materiais são conhecidos, também os componentes de tensão pode ser determinado. Na notação de Voigt, essas constantes são C 11 = 165,7 GPa, C 12 = 63,9 GPa e C 44 = 79,9 GPa para Si com uma rede cúbica 24. A combinação dos resultados de todos os sub-padrões de um Kikuchi PAttern melhora a precisão da avaliação tensão. O erro estatístico determinada a partir de um varrimento da linha ccEBSD numa região livre de defeitos em um único cristal de silício é encontrado como sendo de 2 x 10 -4 para todas as componentes do tensor estirpe. No entanto, para obter resultados quantitativos para o caso de defeitos estendidos, a escolha de um padrão de Kikuchi como padrão de referência é importante. Se, por exemplo, a amostra é completamente coberto por deslocamentos, como mostrado na Figura 2, os procedimentos sofisticados que são propostas por Jiang et al. 25 pode ser aplicada para descobrir o padrão de referência adequada.
A situação para a utilização de ccEBSD é mais fácil para uma bolacha de Si ([001] orientação -Surface) tratado por um feixe de electrões de alta energia para induzir uma fase de re-cristalização líquido (ver Figura 4). Ao redor da pista de re-cristalização, linhas de deslizamento são visíveis na imagem BSE indicando uma DISLocation movimento de deslizamento em aviões com traços paralelos aos bordos da imagem (Figura 4A). As investigações CL foram realizados sob as mesmas condições experimentais que para a amostra plasticamente deformada. As imagens mono-CL, gravado no energias da transição band-a-banda e das bandas deslocamento de luminescência D4 e D2 (Figuras 4B, 4C e 4D, respectivamente), mostram a distribuição espacial dos defeitos estendidos causados pela re -crystallization procedimento. Um anti-correlação local entre a transição band-a-banda e da linha D bandas de luminescência pode ser inferida a partir das imagens mono-CL. Isto é suportado pelos espectros de LC (Figura 4E), que foram medidos em posições de amostra 1, 2 e 3 (ver Figura 4a) no modo do ponto do feixe de electrões. A partir de investigações realizadas ccEBSD como um varrimento da linha em frente da pista de re-cristalização (linha branca na Figura 4A), o componen estirpe tensor locaists ao longo da varredura de linha poderia ser determinado (Figuras 4F e 4G). Foi provado, que, dentro do erro estatístico, os valores não dependem de qual determinado padrão Kikuchi foi usado como o padrão de referência, se este padrão está situado numa região em que a transição banda-de-banda é dominante. As transições eletrônicas relacionadas deslocamento aparecem quando a soma das tensões normais Tr (e) excede um valor de 5 x 10 -4. Porque Tr (ε) não é igual a zero para a verificação de uma região de cerca de 150 um de comprimento perto do circuito de re-cristalização, há uma dilatação significativo da estrutura num volume próximo à superfície da amostra. De acordo com a teoria linear de elasticidade, a tensão normal σ 33 é igual a zero como pressuposto no programa de avaliação "ccEBSD". Se há uma rachadura na verificação das linhas de EBSD, em seguida, uma avaliação ccEBSD não pode ser executada ao longo de toda a varredura com um padrão de referência devido a variações bruscas do padrão cau Kikuchised pelos efeitos geométricos de crack.
O que pode ser conseguido, em princípio, com os métodos experimentais descritos para a investigação das propriedades estruturais, ópticas e eléctricas de limites de grão em Si é mostrada na Figura 5 para uma Si bi-cristal de tipo p dopagem com uma concentração de boro de 10 17 centímetros -3. O mapa EBSD convencional produz a informação completa sobre a orientação de cristal em cada ponto do mapa onde apenas a indexação do padrão Kikuchi é realizada imediatamente após a aquisição modelo pelo software de aquisição. Além disso, também o tipo de limites de grão podem ser exibidos pelos dados EBSD convencionais de gestão do programa (Figura 5A). Para a detecção de um LAGB, um ângulo crítico tem de ser definidas para o misorientation da rede cristalina em dois pontos de medição adjacentes. Um valor mínimo de 1 ° foi provado como sendo apropriados. Para oLAGB indicado no mapa EBSD, o ângulo misorientation é de 4,5 °. O EBIC-imagem da mesma área de amostra (Figura 5B) foi medido a RT. Os limites Σ3 grãos incoerentes e à LAGB aparecem aqui como linhas escuras. Este efeito é causado pelo aumento localmente recombinação transportadora. A partir do perfil de contraste do sinal em toda a EBIC LAGB (cf. Figura 5H), um comprimento de difusão de (60 ± 12) im e uma velocidade de recombinação de (4,1 ± 0,4) x 10 4 centímetros seg -1 foi determinado para o portadores de carga minoritária no âmbito do modelo por Donolato 14. Os únicos pontos escuros na imagem EBIC, espalhados sobre a superfície da amostra inteira e concentrados especialmente nas imediações do LAGB, indicam as posições dos deslocamentos de encadeamento. Em exames imagiológicos CL a 4 K, o LAGB aparece escura na imagem mono-CL em energias de transição band-a-band (Figura 5C), como esperado, mas surprisingly também numa imagem mono-CL na energia da banda D4 (Figura 4D), o que é geralmente atribuído a deslocamentos. No entanto, o LAGB parece brilhante na imagem um mono-CL no comprimento de onda de 1530 nm, que corresponde às bandas de luminescência D1 / D2 (Figura 5E). Este comportamento luminescência é acreditado para ser induzida por defeitos pontuais no bairro dos deslocamentos que constituem o LAGB. Além disso, o procedimento ccEBSD foi realizado como uma linha de exploração através da LAGB para determinar o seu campo de deformação local. A voltagem de aceleração de feixe de electrões foi reduzida para 10 kV para aumentar a resolução espacial para a determinação estirpe à custa de um aumento do tempo total de aquisição para cada padrão de Kikuchi. Os componentes de tensão normais, e o cisalhamento, mostrado nas Figuras 5F e 5G, respectivamente, não pode ser calculado para a região de centro do LAGB (ao longo de cerca de 50 nm) porque os padrões duplos que aparecem evitar uma análise dos padrões de Kikuchi. Maissobre, os padrões EBSD em ambos os lados do LAGB tem de ser correlacionado com dois padrões de referência diferentes, porque o método de correlação cruzada pode ser aplicado apenas para pequenas variações do padrão de difracção. Assim, dois padrões de referência foram recolhidas no lado esquerdo e no lado direito da LAGB devido ao grande ângulo misorientation entre os dois sub-grãos. No entanto, é interessante que os componentes de tensão se comportam de forma simétrica em ambos os lados da LAGB. Os diagramas para a dependência da posição dos componentes de deformação mostram que a gama do campo da estirpe LAGB estende-se a cerca de 350 nm, em ambos os sub-grãos. Pelo contrário, o diagrama do contraste variando localmente na imagem-CL mono banda-de-banda de transição, e de o contraste do sinal EBIC na imagem EBIC (Figura 5H), indica que a influência do LAGB no sinal de luminescência e no sinal EBIC varia até ± 10 pM e 1,5 uM ± do centro do LAGB, respectivamente. Isto verifica a declaração desde o início que a resolução local para a investigação de propriedades diferentes de defeitos estendidos depende fortemente do método experimental e os parâmetros aplicados.

Figura 1. Configurar para CL, EBIC e ccEBSD Medições. (A) SEM com arma de emissão de campo, aberturas diferentes para a imagem latente e análise, a amostra no suporte da crio-amostra, o espelho de recolha de luz CL, o monocromador ea IR-PMT para a luz infravermelha, (B) de contacto Schottky da amostra para investigações EBIC e (C) set-up para a formação e armazenamento de um padrão Kikuchi que pode ser analisado numericamente para obter informações sobre a orientação cristalina, bem como em distorções estrutura de cristal por ccEBSD.d 53872 / 53872fig1large.jpg "target =" / _ blank "> Clique aqui para ver uma versão maior desta figura.
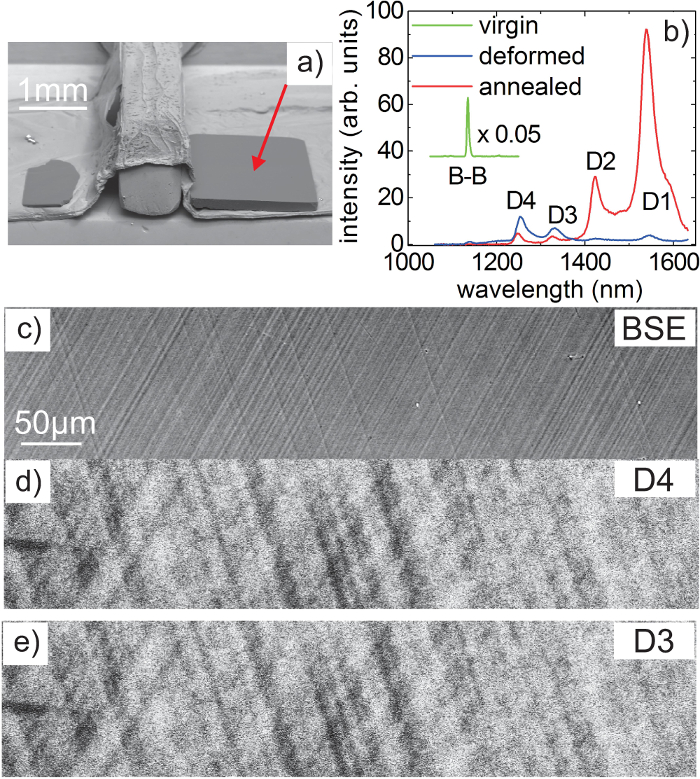
Figura 2. CL espectral e de imagem Investigações em um deformado plasticamente silício monocristalino. (A) amostras de silício na folha de índio posicionado no suporte da crio-amostra. (B) A-CL espectros medidos por um elevado grau de pureza de Si de cristal único (virgem), para uma amostra deformado plasticamente, e após o recozimento adicional. As transições característicos no espectro são rotulados como de costume com BB para uma transição band-a-banda, e D1 a D4 da luxação induzida bandas de luminescência. Linhas (C) deslizar sobre a superfície do cristal Si deformado (marcado pela seta vermelha na Figura 2A) fotografada por elétrons espalhados-back (BSE). Estes resultados mostram deformação plástica para diferentes syste deslizamentoSenhora. Nas Figuras 2D e 2E, as imagens mono-CL para a linha de D4 e linha de D3 são apresentados, respectivamente, com cada medida para a mesma região de exemplo abaixo mostrado no BSE-imagem (Figura 2C). Por favor clique aqui para ver uma versão maior desta figura.

Figura 3. Imagens Visualizing Etapas do Curso de Análise ccEBSD. (A) padrão completa Kikuchi da posição da amostra real com sub-padrão. (B) Um dos sub-padrões e (C) a sua transformação Fourier filtrada. (E) A sub-padrão correspondente a partir de uma posição de referência sobre a amostra e (F), a sua transformação de Fourier filtrada. (D) A função de correlação cruzada (CCF) calculada a partir das transformações de Fourier da sub-padrão. O brilho da CCF foi aumentada em 20% para visualizar os detalhes. Por favor clique aqui para ver uma versão maior desta figura.
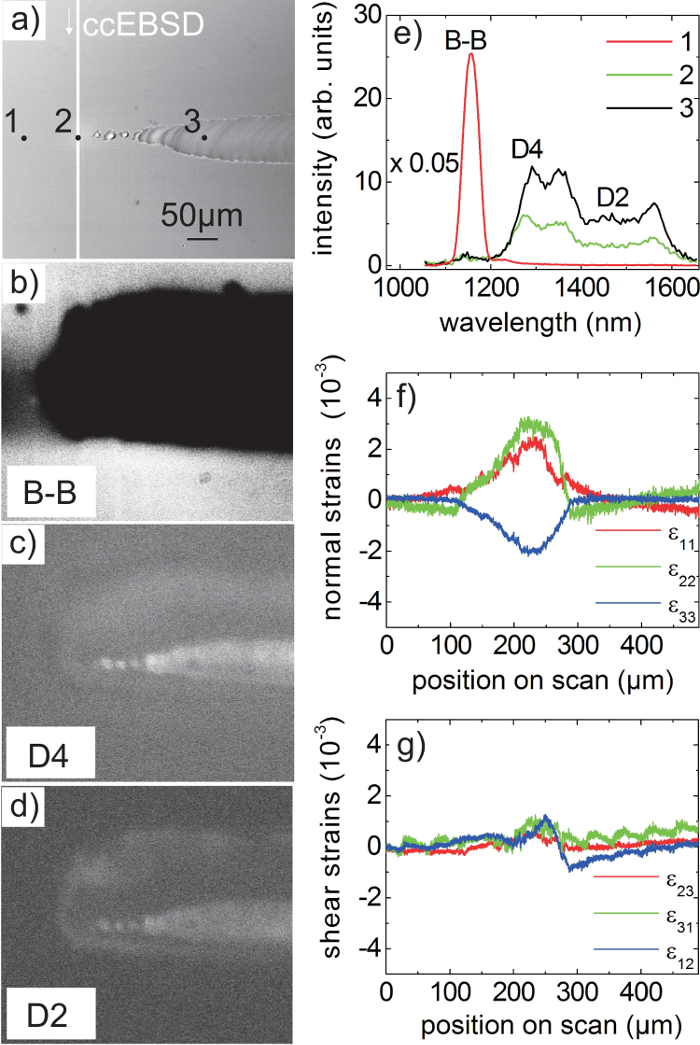
Figura 4. CL e ccEBSD Investigações para uma bolacha de Si após a re-cristalização. (A) imagem de BSE a partir da superfície de uma bolacha de Si com uma faixa de material cristalizou-re após um tratamento por feixe de electrões de alta energia. Posições dos pontos 1, 2 e 3 para CL investigações espectrais são marcadas, bem como a linha com seta de direção onde a digitalização ccEBSD foi realizada. Imagens (BD) Mono-CL da região de amostra mostrado em (A), tomadas nas posições enérgicas da banda-to-banda de transição (B),D4 (C) e banda de luminescência D2 (D). (E) CL espectros medidos nos pontos 1, 2 e 3. O normal (F) e os componentes de tensão de cisalhamento (G) ao longo da linha digitalizar em (A), calculado a partir de investigações ccEBSD. Por favor clique aqui para ver uma versão maior desta figura.

Figura 5. EBSD, EBIC, CL e ccEBSD Investigações sobre a Silicon Bi-cristal com HAGBs e LAGB. Mapa de orientação (A) EBSD em um bi-cristal Si com contornos de grãos individuais em amarelo e um LAGB em preto. A orientação do normal da superfície do grão é indicado. Imagem EBIC à temperatura ambiente da área da amostra em (A), onde coerente (seta amarela) e incohere (B)nt (seta azul) limites de grãos individuais são indicados. (CE) As imagens de mono-CL em energias de BB (C), D4 (D) e D1 / D2 (E) pertencem à região LAGB que é marcada por um rectângulo vermelho na imagem EBIC (B). O normal (F) e os componentes de tensão de cisalhamento (G) calculado a partir de investigações ccEBSD em todo o LAGB. (H) Comparação do contraste encontrado na imagem BB mono-CL em 4K e na imagem EBIC à TA entre os LAGB. Por favor, note a diferença de escala nas coordenada x nos diagramas de componentes de tensão e no diagrama CL e EBIC-contraste. Por favor clique aqui para ver uma versão maior desta figura.
Discussão
A MEV oferece a possibilidade de localizar defeitos extensos no material semicondutor, bem como para caracterizar as suas propriedades estruturais, ópticas e eléctricas através da aplicação de investigações ccEBSD, CL e EBIC. Em geral, não é possível realizar todos os três métodos simultaneamente na mesma amostra. No entanto, uma combinação dos resultados obtidos pelos métodos de investigação diferentes complementares, quando realizado em uma sequência razoável, conduz a uma compreensão mais profunda da natureza física dos efeitos causados por defeitos estendidos.
Para as medições de CL que dão informações sobre as propriedades ópticas dos defeitos estendidos, um passo crítico no protocolo é o procedimento de posicionamento da amostra (passo 1.6), devido a emparelhamento indesejada de defeitos na amostra durante o aquecimento da folha de índio (o que garante um bom contacto térmico e eléctrico da amostra com o suporte de amostra). Uma alternativa para o processo propostoé montar a amostra no suporte da amostra por pasta de prata condutora, à TA. No entanto, a partir da experiência que é sabido que o solvente orgânico na massa pode causar a contaminação de carbono na superfície da amostra durante a análise em MEV. A contaminação degrada a qualidade das imagens CL bem como os padrões de difracção de EBSD. Além disso, o passo de 4,21 requer atenção especial, em que um aumento abrupto da intensidade de luminescência de silício pode ocorrer durante o arrefecimento para baixo da amostra. Isto pode prejudicar o desempenho do fotomultiplicador. Pelo contrário, para o caso de inesperada baixa intensidade de luminescência para a amostragem real, deve-se tentar melhorar o ajustamento do espelho de luz de recolha (Protocolo No. 4.23) porque o alinhamento preliminar espelho foi realizada numa amostra de teste, à TA em uma gama de comprimento de onda ligeiramente diferente.
No que diz respeito limitações instrumentais do método, é preciso levar em conta que a muito baixa temperatURE o palco com a amostra pode ser movido apenas por ± 5 mM na xey instruções que restringe a área das amostras sob investigação. Esta limitação deve-se ao perigo de ruptura frágil do tubo de transferência Ele. As dimensões de amostras de crio experiências dadas em 1.1 e 1.2 são também limitados pelas condições experimentais. Assim, a área de superfície das amostras deve ser ajustado para o tamanho do suporte de amostra para assegurar um contacto térmico óptimo sobre o dissipador de calor. A baixa espessura recomendada das amostras de silício limita o gradiente de temperatura na amostra para as crio experimentos. Para uma espessura de 200 um exemplo, a temperatura no centro do volume de interacção para os electrões primários na região superficial verificou-se ser aumentada por menos do que 5 K, em comparação com a temperatura medida na superfície do suporte de amostras. A velocidade de varredura de alta e baixa ampliação proposta apenas para o procedimento de arrefecimento nos passos 4.5 e 4.17, garantir que the região de interesse é mantido limpo. Isto é devido à transferência de calor por o feixe de scanning electrónica, que mantém uma temperatura sempre ligeiramente acima da temperatura do resto das regiões de amostra que actuam como armadilhas para a condensação do gás residual na câmara de MEV. Geralmente, todos os parâmetros listados na etapa 4.24 para espectroscopia CL são otimizados para a medição do chamado D linha de luminescência em silício em massa pela montagem experimental de acordo com a lista de equipamentos. Os parâmetros têm de ser adaptadas se investigações da luminescência são para ser efectuados com outros materiais semicondutores.
Independente do intervalo de energia de luminescência observada, uma outra limitação das medições CL resultados do espelho de luz de recolha porque a luz proveniente de processos de recombinação radiativa em todo o volume de recombinação é recolhida pelo espelho e, portanto, determina o valor de cinzento dos correspondentes pixel da imagem CL que é assignEd para a posição do feixe de electrões na superfície da amostra. Uma vez que o diâmetro do volume de recombinação (o que é comparável ao volume de excitação) é maior do que o tamanho do pixel, mesmo a baixa ampliação, este efeito provoca uma manchas espacial do sinal de luminescência, e, por conseguinte, limita a resolução espacial. No entanto, a investigação CL permite uma formação de imagens do local de distribuição de luminescência mono- ou panchromatic com uma resolução espectral de médio e poderia ser combinada com as investigações de fotoluminescência para dar uma maior resolução espectral. Recentemente, como um método experimental alternativa ao CL medições, um mapeamento microscópica e espectroscópica de relacionados deslocamento fotoluminescência foi proposto pelo grupo de Tajima e colegas de trabalho 26. A resolução espacial do mapeamento fotoluminescência é claramente menor do que em imagens CL, mas as investigações de fotoluminescência permite, adicionalmente, a polarização da banda de emissão corres nível profundolada a deslocamentos a ser apurado em LAGBs com torção e inclinação estruturas 27,28.
No caso de investigações EBIC, que dão uma visão sobre as propriedades elétricas de defeitos estendidos, não existem métodos alternativos para a imagem do variando localmente eficiência da carga de coleta de materiais semicondutores com uma resolução espacial comparável. No entanto, também para medições EBIC, passos críticos são incluídos no protocolo. Então, no passo 5.13, é esperado que a variação da imagem EBIC com a temperatura decrescente para surgir a partir das propriedades dependentes da temperatura dos defeitos estendidos. No entanto, a qualidade dos contactos pode alterar a temperaturas abaixo de temperatura ambiente e, portanto, influenciar a imagem EBIC. A temperatura afecta o contacto de Schottky, feito com uma camada apropriada de Al, no caso de p de tipo e com Au, no caso de n-tipo silicone, por causa dos diferentes coeficientes de expansão térmica que separam a camada de contacto do silícioN substrato. Além disso, o contacto óhmico feita por um eutéctico de gálio-índio não é estável a temperaturas inferiores a 160 K. Normalmente, a redução da qualidade de contacto conduz a uma diminuição do sinal fortemente EBIC para grandes áreas. Neste caso, os contactos têm de ser renovada. Para investigações EBIC à TA, é também concebível que os contactos para as medições EBSD pode ser feita por ligação a amostra a uma placa de suporte apropriada. Outra limitação das medições instrumentais EBIC é causada pela saliente da ponta de contacto detentores acima da superfície da amostra. Para evitar uma colisão entre o suporte da ponta de contacto e a peça polar do SEM WD deve ser pelo menos 15 mm.
No procedimento experimental para investigações ccEBSD que podem ser usados para estimar o campo estirpe de longo alcance de defeitos estendidos, os seguintes passos são críticos. A parte mais desafiadora do experimento é a preparação da amostra, especialmente o último procedimento de polimento (protocolo No. 3.1), que tem de ser executada com cuidado para evitar a geração de defeitos de superfície adicionais. Se nenhum padrão Kikuchi pode ser obtido, muitas vezes a qualidade da superfície da amostra não é suficiente. No entanto, a partir de silício cristais individuais com linhas de deslizamento sobre a superfície, após a deformação plástica, um bom padrão de difracção pode ser obtido, que estava bem adequado para o processo de avaliação ccEBSD. A rugosidade da superfície destas amostras foi analisada por microscopia de força atómica produzindo uma variação de altura na gama de até 500 nm. Portanto, extremamente elevadas tensões internas ou camadas superficiais amorfos parecem ser responsáveis por padrões de difracção de borradas, em vez de a suavidade imperfeita da superfície da amostra. Uma outra questão poderia ser um sinal de baixa dos elétrons coerentemente espalhadas em comparação com o fundo. Em seguida, um aumento da corrente de sonda de voltagem constante de aceleração e / ou uma determinação mais precisa do sinal de fundo (protocolo passo No. 6.12) umre útil. Para minimizar o movimento da amostra durante a medição ccEBSD de longa duração, recomenda-se fixar a amostra mecanicamente (protocolo nº 3.2).
limitações instrumentais para as investigações ccEBSD pode surgir se a inclinação da superfície da amostra em relação ao feixe de electrões incidente é realizado pela inclinação do palco. Há então fortes restrições para o movimento da amostra devido a um risco de colisão com a peça polar e as paredes da câmara. Além disso, é altamente recomendável usar apenas varreduras de linha que são paralelas ao eixo de inclinação (e, portanto, aparecem na horizontal na tela do SEM), porque, em primeiro lugar, scans verticais têm um grande erro da soma das tensões internas devido ao erro da amostra inclinar. Em segundo lugar, durante EBSD, a resolução lateral é mais elevada (factor de cerca de 3 para 70 ° de inclinação) ao longo do eixo de inclinação do que perpendicular a ele. O limite inferior para o valor dos componentes de tensão tensor calculado para Si a partir de investigações ccEBSD é de cerca de2 x 10 -4 o qual é o erro aleatório. Além disso, deve-se ressaltar que a técnica ccEBSD não pode ser aplicada na presença de grandes rotações de treliça (> 4 °) referentes ao ponto de referência ou muito perto de limites de grãos, onde os padrões EBSD de diferentes grãos se sobrepõem. A limitação física das investigações relativas ccEBSD a resolução espacial da determinação estirpe é devido à gama de difracção de electrões, que se verificou ser de aproximadamente 50 nm ao longo do eixo de inclinação da amostra. Em comparação com as experiências de difracção de raios-X para a determinação das tensões internas, isto é uma vantagem clara, devido ao volume significativamente maior interacção de raios-X, mesmo no caso de raios-X de difracção-μ. Para materiais semicondutores, a investigação de perturbações do índice de refracção isotrópico por um polarscope também pode ser aplicado para a determinação das tensões internas, mas a resolução espacial deste método é inferioralgumas centenas de nm 29. Um método alternativo para a determinação do estado de deformação tridimensional espacialmente resolvida em cristais baseia-se na cisão de zonas de Laue linhas de ordem superior (HOLZ). Este método tem de ser realizado em um microscópio electrónico de transmissão (MET) utilizando um bi-prisma de electrões por interferometria de electrões 30. No entanto, em contraste com as investigações ccEBSD no SEM, a investigação TEM requer a preparação de uma película a partir da amostra, que altera as tensões internas devido a efeitos de relaxamento.
Em estudos futuros, medições ccEBSD também irá ser realizada a baixas temperaturas. Isto irá permitir que a investigação das propriedades estruturais, ópticas e eléctricas, não só no mesmo defeito estendida, mas também à mesma temperatura.
Divulgações
The authors have nothing to disclose.
Agradecimentos
Support of this work by the German Research Foundation (DFG) within the framework of the Research Training Group 1621 is gratefully acknowledged by Paul Chekhonin. All authors are grateful to Dietmar Temmler (Fraunhofer FEP Dresden) for providing the electron beam processed Si samples showing liquid phase re-crystallisation. Special thanks go to Stefan Saager and Jakob Holfeld for the preparation of the figures for the SEM equipment and the EBSD set-up. We thank Michael Stavola for detailed discussions and help with this work.
Materiais
| Name | Company | Catalog Number | Comments |
| Cryogenic liquids: | Linde http://www.linde-gas.de, Air Liquide http://www.airliquide.de/ | ||
| Liquid helium ( LHe ) | for cooling of the cryostat | ||
| Liquid nitrogen ( LN2 ) | for cooling of the PMT R5509-73 | ||
| Indium wire | chemPUR http://chempur.de/ | 900898 | CL sample preparation: for good electrical and thermal coupling between cryostat and sample |
| Mica | plano GmbH http://www.plano-em.de/ | V3 | isolation of EBIC sample holder and good thermal coupling to the cryostat |
| Aluminium wire, gold wire | chemPUR http://chempur.de/ | 009013, 900891 | purity 99.99%, material for formation of Schottky contact for EBIC measurements |
| Indium-Gallium eutectic solution | Alfa Aesar | 12478 | to form ohmic contact on the backside of the sample for EBIC measurements |
| Liquid chemicalsVLSI Selectipur (de-ionized water, acetone, ethanol) | VWR | 52182674, 51152090 | for sample preparation: cleaning and surface treatment |
| Hydrofluoric acid | VWR | 1,003,382,500 | necessary to remove surface oxide layer on Silicon samples immediately before investigation; follow safety precautions! |
| MicroCloth | Buehler http://www.buehler.com/ | 40-7222 | polishing cloth |
| MasterMet 1 (0.02 µm) | Buehler http://www.buehler.com/ | 40-6380-006 | SiO2 polishing suspension |
| Scanning electron microscope (SEM) | Carl Zeiss AG http://www.zeiss.de/microscopy/ | Ultra 55 | field emission gun |
| SEM-CL system | EMSystems | customized, following equipment belongs to CL system: | |
| SEM stage for cryostat | Kammrath & Weiss http://www.kammrath-weiss.com | ||
| KONTI cryostat | Cryovac http://www.cryovac.de/ | 3-06-4609C-7674 | cooling of sample |
| Liquid He transfer line for KONTI cryostat | Cryovac http://www.cryovac.de/ | 3-01-3506C-SO | |
| Cryogenic Temperature Controller | Cryovac http://www.cryovac.de/ | TIC-304 MA | controlling the flow rate of cryogenic |
| Photomultiplier Tube (PMT) | Hamamatsu http://www.hamamatsu.com | R5509-73 | for NIR spectral range |
| PMT housing and cooler | Hamamatsu http://www.hamamatsu.com | C9940-2 | |
| HV power supply | Heinzinger electronic GmbH http://www.heinzinger.de/ | LNC 3000-10 neg | for operating of the PMT |
| Monochromator | Sol Instruments Ltd. http://www.solinstruments.com | MS2004i | |
| PMT | Hamamatsu http://www.hamamatsu.com | R3896 | for visible spectral range |
| CCD digital camera | Proscan GmbH, Proscan Special Instruments Ltd. http://www.proscan.de | HS 101 H | for visible spectral range |
| Control program | Proscan GmbH, Proscan Special Instruments Ltd. http://www.proscan.de | PSI line | for controlling spectral CL measurements with CCD or PMT detectors |
| Laptop | Dell | Latitude 110L | hardware for running the control program |
| LHe dewar | cryotherm http://www.cryotherm.de/ | Stratos 100 SL | container for cryogenic |
| LN2 dewar | container for cryogenic | ||
| Protective glasses | pulsafe | protective equipment | |
| Protective gloves | tempex | Protect line Mod. 4081052 | protective equipment |
| Heating tape | Thermocax Isopad GmbH http://www.isopad-solutions.com | IT-TeMS 6 | to prevent or reduce icing of the flexible hoses during cooling |
| Diaphragm pump | Vacuubrand GmbH & Co KG http://www.vacuubrand.com | ME4 | to provide the flow rate of the cryogenic |
| Vacuum accessoires: flexible hoses, seals, locking rings | connectors for cryogenic CL or EBIC set-up | ||
| Specimen current EBIC amplifier | KE developments / Deben http://deben.co.uk/ | Type 31 | Measuring the EBIC current |
| High vacuum chamber with metal evaporation | customized | formation of Schottky contact for EBIC measurements | |
| Heating plate | Retsch GmbH http://www.retsch.de | SG1 | CL sample preparation |
| EBSD detector Nordlys | HKL | no more available; can be replaced by the Oxford EBSD detectors NordlysMax3 or NordlysNano | |
| EBSD acquisition and evaluation software Channel 5 | HKL | no more available; can be replaced by the Oxford EBSD Software AZtecHKL | |
| ccEBSD program ccEBSD_v1.07.exe | in house written program | for use please contact authors | |
| EBSD interface with remote control system | Carl Zeiss AG http://www.zeiss.de/microscopy/ | necessary for the electron beam control and parameter transfer between EBSD system and SEM | |
| Vibromet2 | Buehler, http://www.buehler.com/ | 671635160 | vibratory polisher |
Referências
- Alexander, H. Chapter 6, Dislocations. Electronic Structure and Properties of Semiconductors. Schröter, E. , Materials Science and Technology; 4. VCH Basel. 249-319 (1991).
- Mahajan, S. Defects in semiconductors and their effects on devices. Acta Mater. 48, 137-149 (2000).
- Holt, D. B., Yacobi, B. G. Extended Defects in Semiconductors- Electronic Properties, Device Effects and Structures. , Cambridge University Press. (2007).
- Hornstra, J. Models of grain boundaries in the diamond lattice. Physica. 25 (1-6), 409-422 (1959).
- Randle, V. Crystallographic characterization of planes in the scanning electron microscope. Mater. Charact. 34 (1), 29-34 (1995).
- Wilkinson, A. J., Meaden, G., Dingley, D. J. High-resolution elastic strain measurement from electron backscatter diffraction patterns: New levels of sensitivity. Ultramicroscopy. 106 (4-5), 307-313 (2006).
- Wilkinson, A. J., Meaden, G., Dingley, D. J. High resolution mapping of strains and rotations using electron backscatter diffraction: New levels of sensitivity. Ultramicroscopy. 106 (4-5), 307-313 (2006).
- Drozdov, N. A., Patrin, A. A., Tkachev, V. D. Recombination radiation on dislocations in silicon. JETP Lett. 23 (11), 597-599 (1976).
- Dean, P. J., Williams, G. M., Blackmore, G. Novel type of optical transition observed in MBE grown CdTe. J Phys. D: Appl. Phys. 17 (11), 2291-2300 (1984).
- Nacke, M., Allardt, M., Chekhonin, P., Hieckmann, E., Skrotzki, W., Weber, J. Investigations on residual strains and the cathodoluminescence and electron beam induced current signal of grain boundaries in silicon. J. Appl. Phys. 115 (16), 163511-1-163511-8 (2014).
- Ikeda, K., Sekiguchi, T., Ito, S., Suezawa, M. EBIC and Cathodoluminescence Study of the Bonded Silicon Wafers. Solid State Phenom. 63-64, 481-488 (1998).
- Sekiguchi, T., Ito, S., Kanai, A. Cathodoluminescence study on the tilt and twist boundaries in bonded silicon wafers. Mater. Sci. Eng. B. 91-92 (4), 244-247 (2002).
- Lee, W., Chen, J., Chen, B., Chang, J., Sekiguchi, T. Cathodoluminescence study of dislocation-related luminescence from small-angle grain boundaries in multicrystalline silicon. Appl. Phys. Lett. 94, 112103(2009).
- Donolato, C. Theory of beam induced current characterization of grain boundaries in polycrystalline solar cells. J. Appl. Phys. 54 (3), 1314-1322 (1983).
- Kittler, M., et al. Regular Dislocation Networks in Silicon as a Tool for Nanostructure Devices used in Optics, Biology, and Electronics. Small. 3 (6), 964-973 (2007).
- Kveder, V., Kittler, M., Schröter, W. Recombination activity of contaminated dislocations in silicon: A model describing electron-beam-induced current contrast behavior. Phys. Rev. B. 63, 115208(2001).
- Higgs, V., Lighthowlers, E. C., Norman, C. E., Kightley, P. Characterisation of dislocations in the presence of transition metal contamination. Mater. Sci. Forum. 83-87, 1309-1314 (1992).
- Donolato, C., Bell, R. O. Characterization of grain boundaries in polycrystalline solar cells using a computerized electron beam induced current system. Rev. Sci. Instrum. 54 (8), 1005-1008 (1983).
- Wilkinson, A. J., Meaden, G., Dingley, D. J. chap. 17, Mapping Strains Using Electron Backscatter Diffraction. Electron Backscatter Diffraction in Material Science. Schwartz, A. J., Kumar, M., Adams, B. L., Field, D. P. , 2nd Edition, Kluwer Academics/Plenum Publishers. New York. 231-249 (2009).
- Childs, G. B., Ericks, L. Y., Powell, R. W. National Bureau of Standards. Thermal Conductivity of Solids at Room Temperature and Below: A Review and Compilation of the Literature. , http://digital.library.unt.edu/ark:/67531/metadc13173/m1/1 (1973).
- Yacobi, B. G., Holt, D. B. Cathodoluminescence Microscopy of Inorganic Solids. , Plenum Press. New York. (1990).
- Everhart, T. E., Hoff, P. H. Determination of Kilovolt Electron Energy Dissipation vs Penetration Distance in Solid Materials. J. Appl. Phys. 42 (13), 5837-5846 (1971).
- Zaefferer, S., Elhami, N. N. Theory and application of electron channelling contrast imaging under controlled diffraction conditions. Acta Mater. 75, 20-50 (2014).
- Schulze, G. Metallphysik. , Akademie Verlag. Berlin. (1967).
- Jiang, J., Britton, T. B., Wilkinson, A. J. Evolution of intragranular stresses and dislocation densities during cyclic deformation of polycrystalline copper. Acta Mater. 94, 193-204 (2015).
- Inoue, M., Sugimoto, H., Tajima, M., Oshita, Y., Ogura, A. Microscopic and spectroscopic mapping of dislocation-related photoluminescence in multicrystalline silicon wafers. J. Mater. Sci.: Mater. Electron. 19, 132-134 (2008).
- Kato, G., Tajima, M., Toyota, H., Ogura, A. Polarized photoluminescence imaging analysis around small-angle grain boundaries in multicrystalline silicon wafers for solar cells. Jpn. J. Appl. Phys. 53, 080303(2014).
- Tajima, M. Spectroscopy and Topography of Deep-Level Luminescence in Photovoltaic Silicon. IEEE J. Photov. 4 (6), 1452-1458 (2014).
- Yablon, A. D. Optical and mechanical effects of frozen-in stresses and strains in optical fibres. IEEE J. Sel. Top. Quant. 10 (2), 300-311 (2004).
- Herring, R., Norouzpour, M., Saitoh, K., Tanaka, N., Tanji, T. Determination of three-dimensional strain state in crystals using self-interfered split HOLZ lines. Ultramicroscopy. 156, 37-40 (2015).
Reimpressões e Permissões
Solicitar permissão para reutilizar o texto ou figuras deste artigo JoVE
Solicitar PermissãoThis article has been published
Video Coming Soon
Copyright © 2025 MyJoVE Corporation. Todos os direitos reservados