Method Article
Caractérisation complète des défauts étendus dans les matériaux semi-conducteurs par un microscope électronique à balayage
Dans cet article
Résumé
The optical, electrical, and structural properties of dislocations and of grain boundaries in semiconductor materials can be determined by experiments performed in a scanning electron microscope. Electron microscopy has been used to investigate cathodoluminescence, electron beam induced current, and diffraction of backscattered electrons.
Résumé
Extended defects such as dislocations and grain boundaries have a strong influence on the performance of microelectronic devices and on other applications of semiconductor materials. However, it is still under debate how the defect structure determines the band structure, and therefore, the recombination behavior of electron-hole pairs responsible for the optical and electrical properties of the extended defects. The present paper is a survey of procedures for the spatially resolved investigation of structural and of physical properties of extended defects in semiconductor materials with a scanning electron microscope (SEM). Representative examples are given for crystalline silicon. The luminescence behavior of extended defects can be investigated by cathodoluminescence (CL) measurements. They are particularly valuable because spectrally and spatially resolved information can be obtained simultaneously. For silicon, with an indirect electronic band structure, CL measurements should be carried out at low temperatures down to 5 K due to the low fraction of radiative recombination processes in comparison to non-radiative transitions at room temperature. For the study of the electrical properties of extended defects, the electron beam induced current (EBIC) technique can be applied. The EBIC image reflects the local distribution of defects due to the increased charge-carrier recombination in their vicinity. The procedure for EBIC investigations is described for measurements at room temperature and at low temperatures. Internal strain fields arising from extended defects can be determined quantitatively by cross-correlation electron backscatter diffraction (ccEBSD). This method is challenging because of the necessary preparation of the sample surface and because of the quality of the diffraction patterns which are recorded during the mapping of the sample. The spatial resolution of the three experimental techniques is compared.
Introduction
Il est connu depuis des décennies que les défauts étendus exercent une influence sur la structure électronique de matériaux semi - conducteurs 1-3. L'effet des défauts étendus sur les performances des appareils électroniques et d'autres applications telles que les capteurs et les matériaux de cellules solaires est sous une vaste étude expérimentale et théorique. Néanmoins, il n'y a aucune théorie généralement admise pour le calcul des états électroniques des semi-conducteurs, en présence de défauts étendus. Ceci est dû à la complexité des calculs de structure électronique dans le cas d'écarts par rapport au réseau cristallin idéal et aussi à la grande diversité en ce qui concerne le type et la configuration des défauts étendus, ainsi que les combinaisons possibles entre elles et avec 0-dim intrinsèque et des défauts extrinsèques.
Les principaux types de défauts étendus sont dislocations (défauts de dimension 1) et des joints de grains (défauts 2 dimensions). Dans ce qui suit, nous avons concentrate sur ces deux types de défauts étendus en fonction des expériences qui peuvent être réalisées au microscope électronique à balayage (MEB). Les méthodes expérimentales présentées ici donnent des informations sur les propriétés structurales, optiques et électriques des défauts étendus et, par conséquent, la connaissance indirecte des états électroniques dans les matériaux semi-conducteurs contenant des défauts étendus. Le contrôle des états électroniques liés à défaut, est une question centrale pour l'application des semi-conducteurs et le fonctionnement des dispositifs à semi-conducteurs.
Pour l'enquête structurelle des défauts étendus, la diffraction d'électrons rétrodiffusés (EBSD) technique peut être appliquée. Habituellement, une mesure d'EPCA est effectuée par la cartographie des points avec un faisceau d'électrons stationnaire à chaque point. EBSD donne alors des informations sur l'orientation cristallographique du réseau cristallin de l'échantillon dans le cas d'un matériau monocristallin et des grains dans les matériaux polycristallins. for cet effet, les motifs de diffraction déterminées expérimentalement formées par les bandes de Kikuchi doivent être analysées par comparaison avec des modèles de simulation déterminées à partir du groupe spatial de cristal du matériau. Si le logiciel pour l'évaluation des données d'orientation est en mesure de calculer l'angle de désorientation entre les systèmes de coordonnées cristallographiques des points de mappage voisins, le type de limite de grains entre eux peut être déterminée. Si l'angle de désorientation est inférieure à 15 °, une limite basse de grain angle (LAGB) est présent; sinon il est une limite de grain à angle élevé (HAGB). Le type de HAGB est caractérisée par sa valeur Σ où Σ -1 est la fraction des points du réseau situés sur un réseau de coïncidence. Alors, Σ = 3 représente la limite à deux très symétrique 4. Si le mappage EBSD sur deux plans de la surface de l'échantillon peut être mesurée à l'aide d'une connaissance précise de la position des applications, le type de plan de joint de grain with indices de Miller hkl peut aussi être évaluée par une méthode proposée par Randle 5.
Récemment, une nouvelle procédure pour l'évaluation du diagramme de diffraction d'électrons a été dérivé par Wilkinson et al 6 , qui permet le calcul de toutes les composantes du tenseur complet de souche locale,., Valeurs absolues des trois souche normale et la souche de trois cisaillement ie. Composants. Ce calcul est effectué pour chaque point de mesure dans un mappage à partir du motif de diffraction correspondant par rapport à un motif de référence prise sur une région cristalline sans contrainte avec la même orientation cristallographique. Cette procédure d'évaluation est fondée sur la détermination de petites variations de caractéristiques du motif EBSD en utilisant la technique de corrélation croisée qui donne le nom ccEBSD. Par rapport à un point de référence choisi, les composants de contrainte et les rotations de réseau peuvent être mesurées avec des précisions de 10 -4 et 0,006 & #176 ;, respectivement 7. L'application de mesures de ccEBSD en ligne balaie à travers les frontières de grains, ou le long des arrangements de dislocations, on peut déterminer localement la quantité ainsi que la gamme des domaines de ces défauts étendus de contrainte.
Les propriétés optiques des dislocations et joints de grains peuvent être étudiés par cathodoluminescence spectrale et imagerie (CL) techniques. Le signal de luminescence est provoquée par la recombinaison radiative de paires électron-trou qui sont produites dans le matériau semi-conducteur par le faisceau d'électrons primaires de la SEM. L'intensité de la luminescence est proportionnelle à l'efficacité de la recombinaison radiative qui est le rapport de la durée de vie des porteurs minoritaires totale au temps de recombinaison radiative. Lorsque ce rapport est influencée localement par des défauts, un contraste de la distribution de luminescence peut être observée dans les images CL. Normalement, les défauts étendus agissent comme non radiative centres de recombinaison et, par conséquent, luminescence de bande à bande recombinaison est réduite au voisinage des défauts étendus par rapport au semi-conducteur non perturbé. Cependant, dans le cas de Si, Ge et des matériaux semi-conducteurs composés, à des dislocations, ainsi que sur les joints de grains, les bandes de luminescence caractéristiques sont observées montrent des énergies de photons inférieures à celle de la recombinaison (directe ou non directe) de bande à bande dans le matériau en vrac 10/08. A titre d'exemple, des recherches approfondies CL de tranches de silicium liés et de silicium multicristallin par Sekiguchi et ses collaborateurs ont montré que 11 à 13 dislocations et LAGBs sont responsables de l'apparition de niveaux peu profonds et profonds dans la bande interdite. Les transitions radiatives correspondantes sont désignées comme des lignes D dans les spectres CL. Néanmoins, le rôle du champ de déformation arrangements de dislocations et de la contamination par la dislocation par précipitation d'oxygène et des impuretés métalliques de transition d'accompagnement est encore controversée pour la Interprétation deion de la luminescence de la ligne D. Mais, si une cession de la position de l'énergie de la ligne de luminescence à un défaut étendu distinct peut être fait avec succès, alors l'apparition de cette ligne spécifique dans le spectre de luminescence peut être considéré comme un signal pour la présence de ce défaut. Pour augmenter l'intensité de luminescence, à savoir., La recombinaison radiative par rapport à celle non radiative, les investigations CL doivent être effectuées à des températures basses (cryo-CL) pour les matériaux semiconducteurs présentant des structures de bande indirecte.
Les propriétés électriques des défauts étendus examinés ici sont caractérisés en imageant le courant du faisceau d'électrons induit (FEMC) dans la MEB. Ce courant peut être observé lorsque des paires électron-trou générées par le faisceau d'électrons primaires sont séparés par un champ électrique intégré. Ce champ peut être généré par le potentiel électrique des défauts étendus eux-mêmes ou par les contacts de Schottky sur la surface de l'échantillon. L'image FEMCcontraste résulte de variations locales de l'efficacité de charge collection en raison d'un comportement de recombinaison variant au niveau des défauts électriquement actifs. Les défauts étendus montrent généralement une recombinaison des porteurs augmenté de sorte qu'ils apparaissent plus sombres dans une image de FEMC que les régions libres de défauts. Dans le cadre de modèles de défauts 14 basés sur la physique, une évaluation quantitative de la dépendance spatiale du signal FEMC, qui est appelé le profil de contraste, permet la détermination du porteur minoritaire longueur de diffusion et la durée de vie, ainsi que la vitesse de recombinaison de surface. Étant donné que ces paramètres dépendent de la température, les enquêtes FEMC devraient également être effectuées à basse température (cryo-FEMC) pour obtenir un signal amélioré par rapport au bruit. En variante, en fonction des mesures de température FEMC permettent la détermination de la concentration en impuretés de niveau profond dislocations selon un modèle qui a été proposé par Kittler et ses collaborateurs 15,16.
Il convient de noter que les propriétés optiques et électriques des défauts étendus dans les semi - conducteurs peuvent être influencées de manière significative par la contamination et par des défauts intrinsèques 0-dim 17 qui ne peuvent pas être résolus par microscopie électronique à balayage. Cependant, la combinaison des méthodes expérimentales, ccEBSD, CL et FEMC, offre la possibilité de visualiser les défauts étendus et quantifier leurs propriétés fondamentales du SEM. Pour les applications futures, où non seulement l'analyse des défaillances, mais aussi défection de contrôle et de l'ingénierie des défauts sont destinés, ce puissant outil jouera un rôle important dans l'amélioration de la performance des dispositifs semi-conducteurs.
Protocole
1. Préparation d'échantillons pour Cryo-CL Experiment
- Utiliser un échantillon en vrac de matériau semi-conducteur (ici le silicium), avec une surface plane, une surface maximale de 5 x 5 mm et une épaisseur dans la plage comprise entre 0,2 et 0,5 mm.
- Nettoyer l'échantillon et le porte-échantillons avec des solvants organiques tels que l'éthanol ou l'acétone. Éliminer la couche superficielle d'oxyde de silicium sur l'échantillon par une immersion dans une solution d'acide fluorhydrique (40%) et d'eau désionisée dans un rapport de 1:10 pendant 1 min. Rincer l'échantillon avec de l'eau déminéralisée.
- Fraiser un morceau de fil d'indium mécaniquement pour former une feuille d'indium avec une surface correspondant à celle de l'échantillon et d'une épaisseur d'environ 0,5 mm.
- Monter le porte-échantillon -pre basculée 60 ° sur une douille métallique, placer la feuille d'indium sur le porte-échantillon et l'échantillon sur le dessus.
- Placer le socle sur une plaque chauffante.
- Mettez la plaque chauffante, la température de contrôle de la prise avec un thermometer et chauffer la douille jusqu'à 150 ° C, de sorte que le processus de fusion de la feuille d'indium est imminente.
Note: Il ne faut pas que l'indium atteint le point de fusion à 157 ° C, mais la feuille doit être ductile. - Fixer l'échantillon sur la feuille d'indium en appuyant sur l'échantillon avec un cure-dent en bois pour 1 sec.
- Eteindre la plaque chauffante et refroidir l'ensemble du système pendant environ 30 min.
2. Préparation d'échantillons pour Cryo-FEMC Experiment
- Utiliser un échantillon en vrac de matériau semi-conducteur (ici le silicium), avec une surface plane, une surface maximale de 5 x 5 mm et une épaisseur dans la plage comprise entre 0,2 et 0,5 mm.
- Nettoyer l'échantillon et le porte-échantillons avec des solvants organiques tels que l'éthanol ou l'acétone. Éliminer la couche superficielle d'oxyde de silicium sur l'échantillon par une immersion dans une solution d'acide fluorhydrique (40%) et d'eau désionisée dans un rapport de 1:10 pendant 1 min. Rincer l'échantillon avec de l'eau déminéralisée.
- Montez le sample dans un système de métallisation et évaporer le métal (par ex., Al sur le type p de Si, Au sur de type n , Si) sur la surface supérieure de l'échantillon pour former un contact de Schottky.
- Déposer une goutte de liquide de gallium-indium eutectique à l'arrière de l'échantillon de silicium et de l'étaler sur pour produire un contact ohmique.
3. Préparation de l'échantillon pour les expériences de ccEBSD
- Préparer une surface d'échantillon plat en appliquant une séquence de meulage et de polissage étapes consistant à diminuer la taille des particules de meulage et de polissage des agents (par ex., Première pâte de diamant 3 pm sur une feuille de papier, puis pâte diamantée 1 um dernier polissage sur une polisseuse vibratoire avec suspension de polissage). Rincer l'échantillon avec de l'eau désionisée entre chaque étape.
- Terminer la préparation de la surface par le nettoyage de l'échantillon dans de l'éthanol dans un bain à ultrasons pendant 3 minutes.
- Fixer l'échantillon sur un porte-échantillon métallique par une fixation mécanique ou par collage d'un adhésif à deux faces conglet arbon.
4. Exécution Cryo-CL Experiment
- Assurer la disponibilité des cryogènes comme l'azote liquide (LN) et de l'hélium liquide (LHE) pour une durée de l'expérience de 8 h.
- Utilisez le cryo-étape de la SEM.
- Insérez le miroir elliptique de collecte de lumière de la position de stationnement à la position dans la mesure SEM.
- Monter un échantillon de test (ici: échantillon en vrac de GaAs) avec une transition de la bande interdite directe sur la scène.
- Evacuer la chambre SEM jusqu'à ce que la valve de chambre de colonne ouvre. Réglez la SEM accélération des paramètres d'imagerie haute tension (HT) à 20 kV, la taille d'ouverture à 240 um, la grande mode courant ON, la vitesse de balayage du faisceau d'électrons à 1, le grossissement à 200 et la réduction du bruit à la moyenne des pixels.
- Utilisez le détecteur Everhart Thornley pour l'imagerie avec des électrons secondaires. Déplacer la platine vers la pièce polaire jusqu'à ce que le faisceau d'électrons peut être focalisé sur la surface d'échantillon à une distance de travail (WD) de 15 mm.
- Exécuter la procédure de démarrage du système de détection CL en allumant l'alimentation électrique du monochromateur, l'alimentation haute tension pour tube photomultiplicateur (PMT), le système de refroidissement VPM et l'ordinateur portable avec le programme de commande CL. Démarrez le programme de contrôle CL et choisissez la mesure du signal de PMT en fonction du temps.
- Définir les valeurs appropriées pour le contraste (maximum) et la luminosité (46%) de la PMT.
- Créer un fichier journal pour enregistrer les expériences.
- Ajuster le miroir collecteur de lumière afin de maximiser l'intensité CL intégrale sur l'échantillon d'essai en inclinant et en faisant tourner le miroir. Enregistrer un spectre de test CL en utilisant le programme de contrôle CL.
- Purger la chambre SEM, retirer l'échantillon d'essai, monter l'échantillon réel sur une feuille d'indium sur le porte-échantillon et évacuer la chambre SEM.
- Relier la sortie des gaz cryogénique du MEB à l'entrée d'une pompe à membrane par des tubes d'aspiration flexible. Utilisez des anneaux de centrage avec un joint torique comme un élément d'étanchéité et fixeravec les bagues de serrage. Stabiliser le système mécaniquement par intégration d'une masse d'amortissement dans le raccord de tuyau.
- Connecter la sortie de la pompe à membrane par un tube d'aspiration flexible à un système de recirculation Il si elle est disponible. Utilisez des anneaux de centrage avec un joint torique comme un élément d'étanchéité et le fixer avec des anneaux de serrage.
- Connecter le capteur de température de l'unité de commande de température avec le connecteur approprié sur la scène SEM. Mettre en marche l'alimentation électrique de l'unité de régulation de température.
- Assembler un ruban chauffant sur le tube de vide flexible à côté de la sortie des gaz cryogénique du SEM.
- Porter des lunettes de protection et des gants de protection. Insérez le tuyau pour le liquide He dans le LHe Dewar. Connecter la sortie du tube de transfert Il avec l'entrée pour les gaz cryogénique du cryo-étape de la SEM.
- Réglez les paramètres de faisceau d'électrons HV à 20 kV, la taille d'ouverture à 240 um, la grande mode courant ON, la vitesse de balayage de l'électronpoutre 1, le grossissement de 200 et la réduction du bruit à la moyenne des pixels.
- Utilisez le détecteur Everhart Thornley pour l'imagerie avec des électrons secondaires. Déplacer la scène vers la pièce polaire et focaliser le faisceau d'électrons sur la surface de l'échantillon à WD = 15 mm pour les expériences de CL.
- Choisissez la zone d'intérêt sur la surface de l'échantillon et de numérisation sur l'ensemble de la région lors de la procédure de refroidissement vers le bas ensemble. Veiller à ce que, pendant toute l'expérience CL la surface de l'échantillon dans la région d'intérêt est à WD = 15 mm par un positionnement approprié de la scène.
- Commencez la procédure de refroidissement vers le bas en entrant la température de consigne la plus basse et appropriées paramètres pour le contrôle PID dans le contrôleur de température selon le manuel technique (par exemple 5 K.,). Ouvrir le robinet du tube de transfert LHe.
- Surveiller la température de l'échantillon, la pression He de la pompe à membrane, et la sortie intégrale du signal CL de la PMT durant la procédure de refroidissement vers le bas. Reduce la largeur de la fente du monochromateur si l'intensité CL devient trop élevée à basse température pour éviter d'endommager le PMT.
- Augmenter l'orifice du tube de transfert lhe si nécessaire pour atteindre la température de consigne.
- Rétablir le WD = 15 mm pour des images ciblées après avoir atteint la température de consigne. Rectifier le réglage du miroir collecteur de lumière pour intégrale intensité maximale de CL sur l'échantillon réel.
- Définissez les valeurs appropriées pour le réseau (300 lignes par mm, blaze à 1000 nm), région spectrale (1.050 à 1.600 nm), la largeur de l'étape (5 nm), le temps par point de mesure (5 sec) et la largeur (1 mm) fente pour CL mesures spectrales sur l'échantillon de silicium. Enregistrement CL spectres de l'échantillon à l'aide du programme de contrôle CL et les enregistrer sur le disque dur de l'ordinateur portable.
- Choisissez le miroir plan dans le monochromateur pour l'imagerie CL panchromatique et un incendie réseau à longueur d'onde particulière pour CL imagerie monochromatique, respectivement. Réglez la luminosité et le contrasteLes valeurs de l'image CL dans la plage linéaire de la dépendance des valeurs de gris du signal de PMT.
- Ajuster la résolution de l' image appropriée (par exemple., 1024 x 768 pixels), la vitesse de balayage et de la méthode de réduction du bruit pour CL imagerie (par exemple., Pour un agrandissement dans la plage comprise entre 200 et 1000 la plus faible vitesse de balayage 14 combiné avec la moyenne des pixels, ou le balayage supérieur vitesse 8 combiné avec la moyenne de ligne de plus de 20 lignes). Enregistrez CL images avec le programme de contrôle SEM et les enregistrer sur le disque dur de l'ordinateur.
- Entrez le nom et les paramètres de chaque spectre et de l'image mesurée pendant toute la session de mesure dans le fichier journal.
- Eteindre la HV du faisceau d'électrons et fermer le robinet de la chambre de colonne SEM avant de modifier la température de l'échantillon en entrant une température cible plus élevée dans le contrôleur de température pour charge enquêtes CL de température.
Note: Ceci est d'éviter un arrêt du canon à électrons par des instabilités de la chambre sous vide dur SEMing échauffement. - Ouvrez le robinet de la chambre de colonne SEM et allumez le HV lorsque la nouvelle température cible est atteinte et le vide du système dans la chambre SEM est à nouveau stable.
- Eteindre la HV du faisceau d'électrons, fermer le robinet de la chambre de colonne SEM, fermer l'obturateur pour le PMT, coupez l'alimentation électrique et de refroidissement du PMT et de lancer la procédure d'échauffement après avoir terminé les mesures de CL prévues aux basses températures.
- Retirez les dispositifs et les outils supplémentaires qui ont été assemblés pour l'expérience cryo-CL sans ouvrir la chambre SEM.
- Laisser la chambre SEM fermé pendant au moins 12 heures. Vérifier que la température du support d'échantillon est à la température ambiante. Dans le cas contraire, faire chauffer le support d'échantillon à la température ambiante avant d'ouvrir la chambre SEM.
Note: Ceci est pour empêcher l'humidité dans la chambre SEM. - Retirer l'échantillon de la scène et évacuer la chambre SEM.
5. Exécution Expérience Cryo-FEMC
- enassurer la disponibilité de LHe pour une durée de l'expérience de 8 h.
- Utilisez le cryo-étape de la SEM.
- Veiller à ce que une plaque de mica est disponible avec une couche de Au évaporé sur la surface supérieure.
- Empilez sur l'échantillon porte d'abord le morceau de mica avec Au couche vers le haut, puis l'échantillon réel sur le mica avec Schottky contact vers le haut. Mettez une pointe de contact sur le Schottky-contact de l'échantillon réel et l'autre sur la couche Au évaporée du mica.
- Evacuer la chambre SEM jusqu'à ce que la valve de chambre de colonne ouvre. Définissez les valeurs appropriées de la réduction SEM des paramètres d'imagerie HV, la taille de l'ouverture, la vitesse de balayage, grossissement et le bruit.
- Allumez l'amplificateur de courant échantillon et choisir la plage de mesure de telle sorte que trois décimales du courant d'échantillon sont affichés.
- Créer un fichier journal pour enregistrer les expériences.
- Effectuez les étapes 04.12 à 04.16 à partir des expériences cryo-CL.
- Définissez les valeurs appropriées du SEM paramètres HV, la taille de l'ouverture, le grossissement, la vitesse de balayage, et la méthode de réduction du bruit pour l'imagerie FEMC (plage recommandée de paramètres pour l'imagerie FEMC des joints de grains sont de 10 à 20 kV pour HV, 20 à 60 pm pour la taille d'ouverture, 30 à 1000 pour le grossissement, 9 à 14 pour la vitesse de balayage, et pixel ou trame moyenne).
- Utilisez le détecteur de courant échantillon pour l'imagerie FEMC. Déplacer la scène vers la pièce polaire et focaliser le faisceau d'électrons pour un WD dans la gamme entre 15 et 25 mm.
- Choisissez la zone d'intérêt sur la surface de l'échantillon et de numérisation sur l'ensemble de la région d'intérêt au cours de la procédure de refroidissement vers le bas ensemble.
- Commencez la procédure de refroidissement vers le bas en entrant la température de consigne la plus basse (par ex., 200 K) et appropriés paramètres pour le contrôle PID dans le contrôleur de température selon le manuel technique. Ouvrir le robinet du tube de transfert LHe.
- Surveiller la température de l'échantillon et la pression He de la pompe à membrane au cours du refroidissementing-bas.
- Diviser l'écran SEM et surveiller le signal d'électrons secondaires du détecteur Everart Thornley en parallèle au signal FEMC du détecteur de courant échantillon pour voir la variation des images avec la température.
- Réajuster la SEM paramètres HV, la taille de l'ouverture, le grossissement, la vitesse de balayage, et la réduction du bruit pour obtenir des images FEMC de contraste élevé. Réajuster également la plage de mesure de l'amplificateur de courant échantillon pour éviter le débordement d'affichage à basse température.
- Re-concentrer le faisceau d'électrons après avoir atteint la température cible.
- Enregistrez les images FEMC. Entrez le nom et les paramètres de chaque image dans le fichier journal.
- Eteindre la HV du faisceau d'électrons et fermer le robinet de la chambre de colonne SEM avant de modifier la température de l'échantillon en entrant une valeur plus élevée de la température cible dans le contrôleur de température pour charge enquêtes FEMC de température. Ouvrez le robinet de la chambre de colonne SEM et allumez le HV lorsque la nouvelle te ciblempérature est atteint et que le vide du système est de nouveau stable.
- Eteindre la HV du faisceau d'électrons, fermer le robinet de la chambre de colonne SEM et exécuter la procédure d'échauffement après avoir terminé les mesures de FEMC prévues aux basses températures.
- Retirez les dispositifs et les outils supplémentaires qui ont été assemblés pour l'expérience cryo-FEMC sans ouvrir la chambre SEM.
- Laisser la chambre SEM fermé pendant au moins 12 heures. Vérifier pour s'assurer que la température du support d'échantillon est à la température ambiante. Dans le cas contraire, faire chauffer le support d'échantillon à la température ambiante avant d'ouvrir la chambre SEM.
- Retirer l'échantillon de la scène et évacuer la chambre SEM.
6. réaliser des expériences de ccEBSD
- Monter l'échantillon dans un petit étau ou sur la broche d'un porte-échantillon qui est pré-incliné dans la plage comprise entre 65 ° et 70 ° par rapport à la direction du faisceau d'électrons.
- Sinon, placez l'échantillon sur la scène eucentrique 6 axes dans le SEM et incliner lescène entière de telle sorte que la surface normale de l'échantillon et la direction du faisceau d'électrons sont à un angle dans la gamme comprise entre 65 ° et 70 °. Assurez-vous que la scène ne sera pas entrer en collision avec les détecteurs et les parois de la chambre.
- Evacuer la chambre SEM jusqu'à ce que la valve de chambre de colonne ouvre. Définissez les valeurs appropriées de la SEM des paramètres d'imagerie HV (20 kV), l' ouverture (120 um), un courant élevé en mode ON, la vitesse de balayage (par exemple., 5), le grossissement (par exemple., 3000) et la réduction du bruit (moyenne de pixel).
- Focaliser le faisceau d'électrons sur la surface de l'échantillon à DEO dans la plage comprise entre 12 et 22 mm.
- Couper la tension d'accélération du faisceau d'électrons et fermer le robinet de la chambre de colonne.
- Allumez l'alimentation électrique pour le détecteur EBSD. Déplacer le détecteur EBSD de la position de stationnement à la position de mesure dans la chambre SEM.
- Ouvrir la vanne de chambre de colonne et activer la tension d'accélération du faisceau d'électrons. Re-focaliser le faisceau d'électrons sur une région d'intérêts sur la surface de l'échantillon.
- Ouvrez le logiciel de contrôle de EPCA et charger le fichier d'étalonnage pour le WD choisi.
- Mettre en place la mesure dans le logiciel de contrôle de EPCA selon le manuel d'exploitation.
- Effectuer l'acquisition de fond selon le manuel d'exploitation de EPCA.
- Lisez la position du centre du motif de EPCA et la distance de détection pour le WD choisi dans le logiciel de contrôle de EPCA.
- Focaliser le faisceau d'électrons dans une région de l'échantillon adjacente à la région d'intérêt pour les mesures réelles. Laissez le faisceau pour y balayer pendant environ 1 h pour la stabilisation.
- Vérifiez la quantité de dérive de faisceau qui ne doit pas dépasser plus de 1 um pendant toute la mesure du EPCA.
- Naviguer dans le faisceau d'électrons vers la région d'intérêt et re-mise au point.
- ligne Schedule analyse parallèle à l'axe de basculement dans la région d'intérêt. Utilisez le mappage de faisceau (pas en scène la cartographie) réglage. Sélectionnez les valeurs appropriées pour le nombre de steps (ex., 100), la taille de l' étape (par exemple., 50 nm), le temps d'exposition (par exemple., 43 msec), moyenne de trame (par exemple., 10) et le détecteur binning (par ex., 2 x 2).
- Assurez-vous de sélectionner "enregistrer toutes les images". Désactiver l'indexation pour accélérer la mesure.
- Exécutez les balayages de ligne jusqu'à ce que le dernier scan est terminé.
- Couper la tension d'accélération du faisceau d'électrons et fermer le robinet de la chambre de colonne.
- Rentrez le détecteur EBSD de la position de mesure de position de stationnement et éteignez l'unité de commande de EPCA.
- Purger la chambre, retirer l'échantillon et évacuer.
7. Analyse du CL-data:
- Vérifier l'étalonnage de réseau en comparant les positions spectrales de raies spectrales connues (par exemple, des pics de lignes de luminescence de l'encombrement et du GaAs non filtrées échantillon d'essai avec les données de la littérature) et de modifier le calibrage de longueur d'onde si nécessaire.
- Corrigez les spectres CL enregistrés (int ensité vs longueur d'onde) par rapport à la sensibilité de la longueur d'onde dépendant du système optique qui se compose de blaze réseau et PMT en divisant l'intensité mesurée par la valeur de sensibilité correspondant à chaque point de mesure.
- Extraire la valeur de gris de chaque pixel d'une image CL et la moyenne des valeurs de gris pour chaque région d'intérêt dans l'image, au moins à l'échelle du volume d'interaction d'électrons dans l'échantillon.
- Déterminer l'intensité CL à la région d'intérêt à partir d'une courbe d'étalonnage des valeurs de gris moyennes des images CL, en fonction de l'intensité CL contraste et de luminosité pour des valeurs données de l'EGP.
- Évaluer l'intensité moyenne CL I CL de l'ensemble de l' image CL et le signal sombre I 0 du détecteur CL.
- Calculer le contraste C CL entre les régions apparaissant claires et sombres de l'image CL par l'équation suivante:
d / 53872 / 53872eq1.jpg "/>
8. Analyse de la FEMC-data:
- Extraire la valeur de gris de chaque pixel d'une image FEMC et la moyenne des valeurs de gris pour chaque région d'intérêt pour quantifier les variations spatiales de l'intensité de la FEMC en termes de contraste de FEMC.
- Déterminer le profil de contraste EBIC des valeurs de gris à résolution spatiale due à C. Donolato et RO de Bell 18.
- Calculer la superficie et la variance des profils de contraste FEMC.
- Déterminer des paramètres physiques tels que la longueur de diffusion et la vitesse de recombinaison superficielle des porteurs de charge minoritaires à partir de la surface calculée et de la variance du profil de contraste FEMC selon les règles données par Donolato 14.
9. Analyse des expériences de ccEBSD
- Utilisez le logiciel "ccEBSD" en interne écrite programmée par Paul Chekhonin pour l'évaluation des modèles de EPCA enregistrés.
- Choisissez une appropriatEPCA motif e qui agira en tant que motif de référence à partir d'un point de mesure qui doit être situé dans une zone de l'échantillon absent des souches.
- Appliquer au moins 15 régions largement distribués d'intérêt sur le modèle.
- Utiliser les coordonnées du centre de motif et la distance de détection qui ont été déterminées par le logiciel de contrôle EBSD pour la poursuite de l'évaluation.
- Entrez le reste des paramètres pertinents pour l'évaluation, à savoir., Les constantes élastiques du matériau analysé, le nombre d'étapes dans la ligne de balayage et de la taille de l' étape, la taille du détecteur et sa résolution en pixels, détecteur et spécimen inclinaison angles ainsi que le détecteur binning.
- Utiliser un filtre passe-bande lors du calcul de la transformation de Fourier à 2 dimensions (filtre interne de 6 pixels et d'un filtre externe de 40 pixels).
- Exécutez le programme d'évaluation.
- Lire les résultats numériques du fichier texte d'évaluation "protocol.txt" à l'aide d'un tableur classique worsque le calcul est terminé.
Résultats
Les propriétés structurelles, électriques et optiques des défauts étendus dans un matériau semi-conducteur ont été étudiés par différents procédés expérimentaux dans le microscope électronique à balayage. En général, il est possible d'étudier ces propriétés sur le même échantillon, et avec quelques efforts concernant la préparation de l'échantillon, même sur un seul défaut distinct comme une limite de grain ou d'un arrangement localisé de dislocations. Toutefois, il convient de noter qu'en raison des produits d'interaction spécifiques du faisceau d'électrons primaires avec le matériau semi-conducteur utilisé pour le contrôle des propriétés de défaut physique, la résolution spatiale qui peut être obtenue par CL, FEMC ou ccEBSD enquêtes diffèrent les unes des autres. Dans la figure 1, les schémas sont donnés pour une mise en place appropriée de la SEM adaptée pour les mesures de CL à basse température (Figure 1A), l'ensemble des enquêtes de FEMC (Figure 1B ), ainsi que la mise en page des principaux éléments matériels nécessaires pour (cc) tests de EPCA (Figure 1C).
Tous les résultats donnés ici sont représentatifs obtenus pour le silicium comme vitrine pour un matériau semi-conducteur à structure de bande électronique indirecte. Cette structure de bande empêche toutes les mesures de luminescence en raison de la faible probabilité de transitions radiatives par rapport aux semi-conducteurs avec des structures de l'écart de bande directe. Pour réaliser l'intensité de luminescence suffisante pour obtenir des résultats statistiquement assuré est difficile. Dans ce qui suit, les procédures expérimentales sont décrites pour l'étude des perturbations induites par la déformation plastique ainsi que par la phase liquide de recristallisation dans monocristaux de silicium. En outre, des recherches sur un cristal de silicium bi avec des limites de grains jumeaux et une limite de grain à angle faible sont présentés.
La figure 2A montre un exemple de positionnement d'un échantillon approprié sur la feuille d'indium pour garantir un bon contact thermique avec le support cryo-échantillon dans lequel la température est mesurée par le thermocouple. Il a été prouvé expérimentalement que , pour le silicium, d' une épaisseur d'environ 200 à 500 um d'échantillon est bien adapté pour la cryo-CL enquêtes à des températures jusqu'à 5 K. La CL spectres donnés sur la figure 2B ont été mesurées pour un monocristal de Si à l'état vierge après la déformation plastique et, après un recuit supplémentaire. Le faisceau d'électrons dans la MEB a été effectuée à un électron tension d'accélération de faisceau de 20 kV et un courant de sonde d'environ 45 nA dans le mode de balayage défocalisé, ce qui se traduit par une intensité élevée CL due à électron-trou génération de couple dans un grand volume ( environ (450 x 250 x 3) um 3) avec une densité d'excitation modérée. Dans ce mode de balayage, la surface de l'échantillon est effectivement sur WD = 15 mm, mais électroniquement un WD = 0 est ajustée. CL 'imagerie, bien entendu, le faisceau d'électrons doit être centré ce qui donne un diamètre de spot du faisceau d'électrons sur la surface de quelques nm de l'échantillon, mais avec la même profondeur de pénétration de quelques um pour les électrons primaires comme dans le mode de balayage défocalisé. Le temps d'acquisition par image avec une résolution de boutique de 1024 x 768 pixels est d'environ 10 min en mode moyenne de pixels à une vitesse de balayage 14 du faisceau d'électrons. Il a été calculé et confirmé expérimentalement que, pour le mode de balayage défocalisé la température de la zone d'échantillon à l'étude est augmentée ne dépasse pas un certain 0,1 K par transfert d'énergie de chaleur due au faisceau d'électrons. Dans le mode focalisé, le chauffage de l' échantillon local dépend fortement de la conductivité thermique , qui , à son tour dépend du dopage de l' échantillon et la température elle - même 20. Pour la zone flottante échantillon cultivé Si, P dopé avec du bore à une concentration de 10 15 cm -3, dans le mode de balayage focalisé, une augmentation de température AT localeenviron 2 K a eu lieu à une température de cryostat de 5 K et de ≈ 0,3 AT K à 25 K.
Pour étudier les propriétés optiques des dislocations, un échantillon de silicium en vrac a été soumis à une déformation plastique à une pression de 16 MPa à 800 ° C, suivie d'une deuxième étape de déformation à 295 MPa à 420 ° C. Les lignes de glissement, représentées sur la figure 2C , sur la surface d'une partie de l'échantillon déformé, sont provoqués par des processus dislocation de glissement sur les deux plans de glissement 111 orientées différentes. Les lignes de glissement peuvent être visualisées par des électrons rétrodiffusés (BSE). Les lignes de glissement indiquent les traces des plans de treillis sur lequel la plupart des dislocations sont alignés. CL (mono-CL) les images monochromatiques (figures 2D et 2E) ont été acquises à des positions énergétiques des bandes de luminescence D4 et D3 et ne souffrent pas de manière significative le profil de la topographie de la surface provoquée par des lignes de glissement. Ceci a été vérifié par CL enquêtes unprès un de polissage de surface minutieuse qui a montré le même modèle luminescence de bande presque inchangée comme sur la surface de l'échantillon à l'origine ondulée, où les modèles de la raie d'intensité CL sont parallèles aux traces de plan de glissement. S'il est prévu d'analyser la distribution locale de l'intensité de luminescence CL quantitativement à partir de l'image, l'image CL doit être enregistrée dans la plage linéaire de la relation entre le signal CL et valeur de gris. Cette relation peut être déterminée expérimentalement en mesurant la corrélation entre l'image de gris et signal absolu du photomultiplicateur au contraste et la luminosité des valeurs données pour le détecteur. Au contraire, si elle est destinée à visualiser les petites variations d'intensité CL sur la surface de l'échantillon, puis pour obtenir les meilleurs résultats, une relation non linéaire le signal à gris valeur est déjà appliquée lors du processus d'imagerie dans la MEB. La résolution spatiale d'une image sur un échantillon CL Si en vrac à basse température est déterminée par la taille de l'interactionvolume des électrons primaires dans l'échantillon, parce que la taille du volume de cette interaction est que marginalement inférieur au volume de la recombinaison radiative des paires électron-trou 21. Le diamètre du volume d'interaction pour un faisceau focalisé et stationnaire est d' environ 3 um dans les conditions expérimentales 22 données.
L'estimation du champ de déformation entourant les défauts étendus par ccEBSD nécessite l'enregistrement de motifs Kikuchi avec une qualité suffisante, même sur les régions d'échantillons très tendues. Un exemple est donné sur la figure 3A. Pour obtenir ces motifs, la surface de l' échantillon doit être exempte de couches de surface indésirables (oxydes de carbone, contamination, etc.). De bons résultats peuvent être obtenus avec les paramètres expérimentaux suivants: faisceau d'électrons à 20 keV et 12 nA, l'inclinaison de la surface de l'échantillon normal entre 60 ° et 70 ° par rapport au faisceau incident à WD = 15 mm, 2 x 2 EPCA Detecteur pixel binning qui donne une résolution de 672 x 512 pixels, gain d'amplification du signal mis à élevé, le temps d'exposition entre 20 et 43 msec par image sur le détecteur EBSD, une moyenne de plus de cinq à dix images par point et le stockage des Kikuchi mesure motif que des images pour chaque point sans indexation de mesure. Le temps total d'acquisition pour un motif Kikuchi peut être estimée à partir de la durée d'exposition multipliée par le nombre d'images ainsi que quelques 10 msec en raison du temps nécessaire pour le décalage du faisceau, lu et le stockage. Une valeur de 50 nm est avéré expérimentalement pour être une bonne taille de pas minimum entre deux positions échantillons au sein de la cartographie EBSD. Ceci est en accord avec les considérations théoriques récentes 23 concernant la résolution réalisable pour le contraste de diffraction électronique. Pour éviter la dérive du faisceau au cours de la cartographie EBSD, il est recommandé d'attendre au moins 15 minutes avec le balayage du faisceau dans le voisinage immédiat de la région d'intérêt avant de lancer la carte.On a constaté que la seule ligne EBSD balaye l'échantillon parallèle à l'axe d'inclinaison fournissent des données de contrainte réaliste avec un motif de référence sur la même ligne. Dans le cas contraire, une détermination très attention de l'angle d'inclinaison de l'échantillon réel est nécessaire, ou encore la longueur d'une ligne de balayage perpendiculaire à l'axe de basculement doit être limitée à quelques microns.
Le motif Kikuchi stocké sous forme de fichiers JPEG 8 bits ont été évalués par transformation de Fourier (FT) et de corrélation croisée avec un programme "ccEBSD", écrit par l'un des auteurs (PC). Le programme est basé sur l'algorithme développé par Wilkinson et.al. 6, décrit en détail dans ref. 19. Dans le motif Kikuchi, plusieurs (15-19) sous-motifs (128 x 128 pixels) doivent être définis avec caractéristiques que les passages de la bande lumineuses (cf. figures 3A et 3B). Tous les sous-modèles doivent être analysés par FT. Un filtre passe-bande doit être appliqué à toutes les images FT (6 pi de rayon internexels pour les basses fréquences, un rayon de 40 pixels pour des fréquences plus élevées externe) pour régler toutes les valeurs à zéro à l' extérieur du filtre passe-bande dans l'espace de Fourier (voir la figure 3C). Ensuite , la fonction (figure 3D) de corrélation croisée (cc) doit être calculée entre le FT de chaque sous-motif avec le FT respectif de la sous-configuration (figures 3E et 3F) à partir du motif de référence Kikuchi. A partir des positions des pics dans les CC-fonctions (figure 3D), les déplacements relatifs des sous-motifs peuvent être déterminés. L'utilisation de ces déplacements, les composantes normales et de cisaillement contrainte peut être calculée. Si les constantes élastiques dépendantes matériaux sont connus, également les éléments de contrainte peuvent être déterminées. Dans la notation par Voigt, ces constantes sont C 11 = 165,7 GPa, C 12 = 63,9 GPa et C 44 = 79,9 GPa pour Si avec un réseau cubique 24. La combinaison des résultats de tous les sous-motifs d'une Kikuchi pattern améliore la précision de l'évaluation de la souche. L'erreur statistique déterminée à partir d' un balayage de ligne de ccEBSD sur une région exempte de défaut dans un seul cristal de silicium se trouve être 2 x 10 -4 pour tous les composants souche tenseur. Néanmoins, afin d'obtenir des résultats quantitatifs pour le cas de défauts étendus, le choix d'un motif Kikuchi comme motif de référence est important. Si, par exemple, l'échantillon est complètement recouverte par les dislocations comme le montre la figure 2, les procédures complexes qui sont proposés par Jiang et al. , 25 pourraient être appliqués à savoir le motif de référence approprié.
La situation pour l'utilisation de ccEBSD est plus facile pour une tranche de Si ([001] -surface orientation) traité par un faisceau d'électrons à haute énergie pour induire une phase liquide re-cristallisation (voir la figure 4). Autour de la piste de re-cristallisation, lignes de glissement sont visibles dans l'image de l'ESB indiquant une Dislmouvement ocation sur des plans de glissement avec des traces parallèles aux bords de l'image (figure 4A). Les investigations CL ont été effectuées dans les mêmes conditions expérimentales que pour l'échantillon déformé plastiquement. Les images mono-CL, enregistrées aux énergies de la transition de bande à bande et des bandes dislocation luminescence D4 et D2 (figures 4B, 4C et 4D, respectivement), montrent la distribution spatiale des défauts étendus causés par la re -crystallization procédure. Une contre-corrélation locale entre la transition de bande à bande et les bandes de luminescence de la ligne D peut être déduite à partir des images mono-CL. Ceci est soutenu par les spectres de CL (figure 4E) qui ont été mesurées à des positions d'échantillons 1, 2 et 3 (voir la figure 4A) en mode de fonctionnement du faisceau d'électrons au comptant. Des enquêtes ccEBSD effectuées en tant que ligne de balayage en face de la piste re-cristallisation (ligne blanche sur la figure 4A), la componen souche tenseur localets le long de la ligne de balayage peuvent être déterminées (figures 4F et 4G). Il a été prouvé, que, dans l'erreur statistique, les valeurs ne dépendent pas de motif particulier qui Kikuchi a été utilisé en tant que motif de référence si ce modèle est situé dans une zone où la transition de bande à bande est dominant. Les transitions électroniques de dislocation liées apparaissent lorsque la somme des souches normales Tr (e) de dépasse une valeur de 5 x 10 -4. Parce que Tr (ε) ne soit pas égal à zéro pour le balayage d'une région d'environ 150 um de longueur proche de la piste re-cristallisation, il existe un réseau de dilatation moyenne dans un volume proche de la surface de l'échantillon. D' après la théorie linéaire de l' élasticité, la contrainte normale σ 33 est égal à zéro présupposé dans le programme d'évaluation "ccEBSD". S'il y a une fissure sur le balayage de ligne d'EPCA, puis une évaluation de ccEBSD ne peut pas être effectuée sur l'ensemble de balayage avec un motif de référence en raison de variations brusques du motif cau Kikuchised par les effets géométriques de la fissure.
Qu'est - ce qui peut être réalisé en principe par les méthodes expérimentales décrites pour l'étude des propriétés structurales, optiques et électriques des joints de grains dans Si est représenté sur la figure 5 pour un Si bi-cristal-dopage de type p avec une concentration de bore de 10 17 cm -3. La carte EPCA conventionnelle donne l'information complète sur l'orientation cristalline à chaque point de la carte où seule l'indexation du motif Kikuchi est effectuée immédiatement après l'acquisition de motif par le logiciel d'acquisition. De plus, aussi le type de joints de grains peut être affiché par les données de EPCA classiques de gestion programme (figure 5A). Pour la détection d'un anneau gastrique, d'un angle critique doit être défini pour le défaut d'orientation du réseau cristallin au niveau de deux points de mesure adjacents. Une valeur minimale de 1 ° a été prouvé pour être approprié. Pour leLAGB indiqué dans le plan d'EPCA, l'angle de désorientation est de 4,5 °. La FEMC-image de la même zone d'échantillonnage (figure 5B) a été mesurée à la température ambiante. Les incohérentes joints de grains de Σ3 et l'LAGB apparaissent ici comme des lignes sombres. Cet effet est provoqué par la recombinaison des porteurs localement augmentée. À partir du profil de contraste du signal de FEMC à travers l'anneau gastrique (cf. figure 5H), d' une longueur de diffusion (60 ± 12) um et une vitesse de recombinaison de (4,1 ± 0,4) x 10 4 cm s - 1 ont été déterminées pour la porteurs de charge minoritaires dans le cadre du modèle par Donolato 14. Les points noirs simples dans l'image FEMC, répartis sur la surface de l'échantillon et concentrées surtout dans les environs de l'LAGB, indiquent les positions des dislocations. Dans CL imagerie enquêtes à 4 K, le LAGB apparaît sombre dans l'image mono-CL à des énergies de bande à bande de transition (Figure 5C), comme prévu, mais surprisingly également dans une image mono-CL à l'énergie de la bande D4 (figure 4D) , qui est généralement attribué à dislocations. Cependant, le LAGB semble prometteur dans une image mono-CL à une longueur d'onde de 1530 nm correspondant aux bandes de luminescence D1 / D2 (Figure 5E). Ce comportement de luminescence est censé être induite par des défauts ponctuels dans le voisinage des dislocations constituant le LAGB. En outre, la procédure de ccEBSD a été réalisée comme une ligne de balayage à travers l'anneau gastrique afin de déterminer son champ de déformation locale. La tension d'accélération du faisceau d'électrons a été réduite à 10 kV pour augmenter la résolution spatiale pour la détermination de la déformation à la charge d'un temps d'acquisition total a augmenté pour chaque motif de Kikuchi. Les composants de la souche normale et de cisaillement, représentés sur les figures 5F et 5G, respectivement, ne peuvent pas être calculées pour la zone centrale de l'anneau gastrique (plus d' environ 50 nm) , car les modèles doubles apparaissent qui empêchent une analyse des motifs de Kikuchi. Plusdessus, les motifs EBSD des deux côtés de l'anneau gastrique doivent être corrélés avec deux modèles de référence différents, car la méthode de corrélation croisée ne peut être appliqué aux petites variations du diagramme de diffraction. Ainsi, deux modèles de référence ont été recueillies sur le côté gauche et sur le côté droit de l'LAGB en raison du grand angle de désorientation entre les deux sous-grains. Néanmoins, il est excitant que les éléments de déformation se comportent de manière symétrique sur les deux côtés de l'anneau gastrique. Les diagrammes de la dépendance de la position des composants de contrainte montrent que la portée du champ de l'anneau gastrique de contrainte se prolonge à environ 350 nm dans les deux sous-grains. Au contraire, le diagramme du contraste variant localement dans l'image-CL mono-bande à la bande de transition et du contraste du signal FEMC dans l'image FEMC (figure 5H), indique que l'influence de l'anneau gastrique sur le signal de luminescence et sur le signal de FEMC varie jusqu'à ± 10 um et de ± 1,5 um à partir du centre du LAGB, respectivement. Cela permet de vérifier la déclaration dès le début que la résolution locale pour l'étude des propriétés différentes de défauts étendus dépend fortement de la méthode expérimentale et les paramètres appliqués.

Figure 1. Configuration pour CL, FEMC et ccEBSD mesures. (A) SEM avec émission de champ pistolet, différentes ouvertures pour l' imagerie et l' analyse, l'échantillon sur le support cryo-échantillon, le miroir collecteur de lumière CL, le monochromateur et la IR-PMT pour la lumière infrarouge, (B) contact Schottky de l'échantillon pour les enquêtes FEMC et (C) mis en place pour la formation et le stockage d'un motif Kikuchi qui peut être analysé numériquement pour obtenir des informations sur l'orientation du cristal ainsi que sur réseau cristallin des distorsions par ccEBSD.d / 53872 / 53872fig1large.jpg "target =" _ blank "> S'il vous plaît cliquer ici pour voir une version plus grande de cette figure.
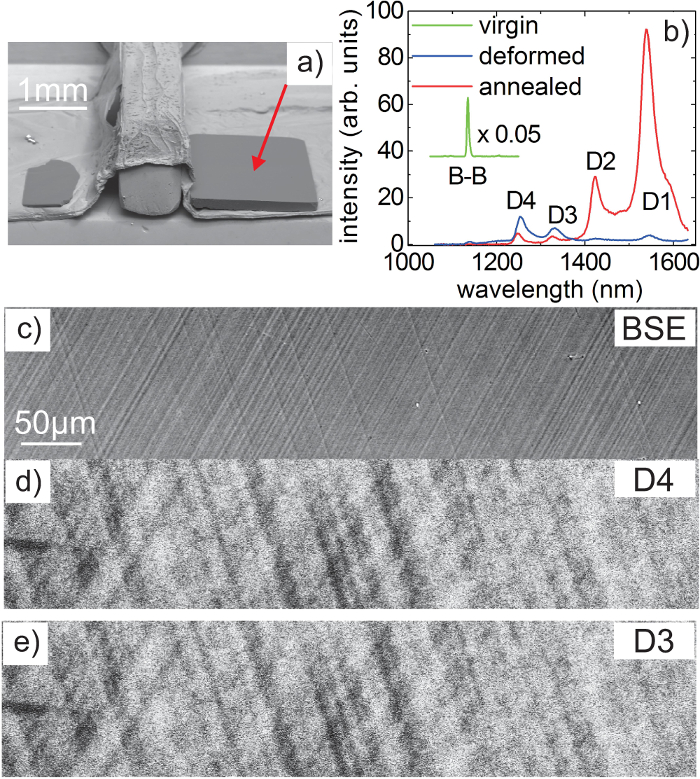
Figure 2. CL Spectral et imagerie Investigations sur un seul cristal de silicium déformé plastiquement. (A) des échantillons de silicium sur une feuille d'indium positionné sur le support cryo-échantillon. (B) Le CL-spectres mesurés pour une pureté élevée en Si monocristallin (vierge), pour un échantillon déformé plastiquement et , après un recuit supplémentaire. Les transitions caractéristiques dans les spectres sont marqués comme d'habitude avec BB pour une transition de bande à bande, et D1 à D4 pour dislocations induites par les bandes de luminescence. Lignes (C) de glisser sur la surface du cristal Si déformée (marqués par la flèche rouge dans la figure 2A) imagé par des électrons rétrodiffusés (ESB). Ces résultats montrent la déformation plastique pour différents syste de glissementMme. Dans les figures 2D et 2E, les images mono-CL pour la ligne D4 et la ligne D3 sont représentés, respectivement, chaque mesurée pour la même région de l' échantillon inférieur à celui indiqué sur l'ESB image (figure 2C). S'il vous plaît cliquer ici pour voir une une plus grande version de ce chiffre.

Figure 3. Images Visualisation Étapes du cours d'analyse ccEBSD. (A) de modèle complet Kikuchi de la position réelle de l' échantillon avec des sous-modèle. (B) L' un des sous-motifs et (C) la transformation de Fourier filtrée. (E) Le sous-motif correspondant à partir d' une position de référence sur l'échantillon et (F) la transformation de Fourier filtrée. (D) la fonction de corrélation croisée (CCF) calculé à partir des Fourier-transformations de la sous-modèle. La luminosité du CCF a été augmenté de 20% pour visualiser les détails. S'il vous plaît cliquer ici pour voir une version plus grande de cette figure.
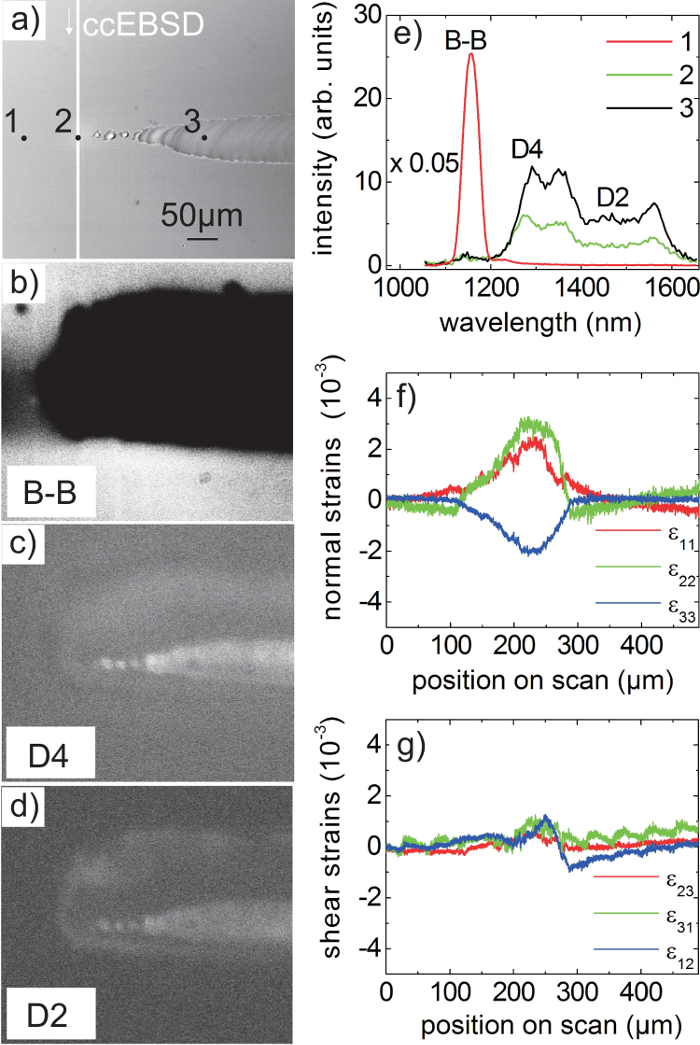
Figure 4. CL et ccEBSD enquêtes pour un Si Wafer Après Re-cristallisation. (A) l' image de l' ESB à partir de la surface d'une tranche de Si avec une piste de matériau de re-cristallisé après le traitement par un faisceau d'électrons à haute énergie. Positions des points 1, 2 et 3 pour CL investigations spectrales sont marquées, ainsi que la ligne avec flèche de direction où le balayage ccEBSD a été réalisée. Images (BD) Mono-CL de la région de l' échantillon représenté en (A), prises au niveau des positions énergiques de la bande à bande de transition (B),D4 (C) et D2 (D) bande de luminescence. (E) CL spectres mesurés au niveau des points 1, 2 et 3. La normale (F) et les composants de contrainte de cisaillement (G) le long de la ligne de balayage dans (A), calculée à partir des enquêtes de ccEBSD. S'il vous plaît cliquer ici pour voir une version plus grande de ce chiffre.

Figure 5. EPCA, FEMC, CL et ccEBSD enquêtes sur une Silicon Bi-cristal avec HAGBs et LAGB. (A) EPCA orientation carte sur un bi-cristal Si avec des joints de grains jumeaux en jaune et un LAGB en noir. L'orientation de la normale de la surface du grain est indiquée. (B) image FEMC à la température ambiante de la zone d'échantillon dans (A) où cohérente (flèche jaune) et incoherent (flèche bleue) joints de grains jumeaux sont indiqués. (CE) Les images mono-CL à des énergies de BB (C), D4 (D) et D1 / D2 (E) appartiennent à la région LAGB qui est marquée par un rectangle rouge dans l'image FEMC (B). La normale (F) et les composants de contrainte de cisaillement (G) calculées à partir des enquêtes de ccEBSD à travers le LAGB. (H) Comparaison du contraste trouvé dans l'image BB mono-CL à 4K et dans l'image de FEMC à TA à travers le LAGB. S'il vous plaît noter les différentes mise à l' échelle sur les coordonnées x dans les diagrammes de composants de traction et dans le diagramme CL- et FEMC contraste. S'il vous plaît cliquer ici pour voir une version plus grande de cette figure.
Discussion
SEM offre la possibilité de localiser des défauts étendus dans le matériau semi-conducteur, ainsi que pour caractériser leurs propriétés structurelles, électriques et optiques par l'application de ccEBSD, CL et FEMC investigations. En général, il est impossible d'exécuter les trois méthodes simultanément sur le même échantillon. Toutefois, une combinaison des résultats obtenus par les différentes méthodes d'investigation complémentaires, lorsqu'il est effectué dans une séquence raisonnable, conduit à une compréhension plus profonde de la nature physique des effets causés par les défauts étendus.
Les CL mesures donnent des informations sur les propriétés optiques des défauts étendus, une étape critique dans le protocole de la procédure de positionnement de l'échantillon (étape 1.6), en raison d'un recuit indésirable des défauts dans l'échantillon au cours du chauffage de la feuille d'indium (ce qui assure un bon le contact thermique et électrique de l'échantillon avec le porte-échantillon). Une alternative à la procédure proposéeconsiste à monter l'échantillon sur le porte-échantillon par une pâte conductrice d'argent à la température ambiante. Cependant, d'après l'expérience, il est connu que le solvant organique dans la pâte peut provoquer une contamination de carbone sur la surface de l'échantillon pendant le balayage dans la MEB. La contamination se dégrade la qualité des images CL, ainsi que des motifs de diffraction EBSD. En outre, l'étape consistant à 4,21 nécessite une attention particulière, lorsqu'une brusque augmentation de l'intensité de luminescence du silicium peut se produire pendant le refroidissement vers le bas de l'échantillon. Cela peut nuire à la performance du photomultiplicateur. Au contraire, pour le cas d'imprévu faible intensité de luminescence de l'échantillon réel, il faut essayer d'améliorer le réglage du miroir collecteur de lumière (protocole n ° 4.23), car l'alignement miroir préliminaire a été effectué sur un échantillon d'essai à la température ambiante dans un peu différente gamme de longueur d'onde.
En ce qui concerne les limites instrumentales de la méthode, il faut prendre en compte que, à très faible temperatUres la scène avec l'échantillon peut être déplacé que de ± 5 mm dans le x et y directions qui limite la zone des échantillons soumis à l'enquête. Cette limitation est due au risque de rupture fragile du tube de transfert He. Les dimensions d'échantillon pour cryo-expériences données en 1.1 et 1.2 sont également limités par des conditions expérimentales. De sorte que la surface des échantillons doit être ajustée à la taille du porte-échantillons afin d'assurer un contact thermique optimal sur le dissipateur thermique. La faible épaisseur recommandée des échantillons de silicium limite le gradient de température dans l'échantillon pour les cryoprotecteurs expériences. Pour une épaisseur de 200 um d'échantillon, a été trouvé que la température au centre du volume d'interaction pour les électrons primaires dans la région de la surface devant être augmentée de moins de 5 ° C par rapport à la température mesurée à la surface du porte-échantillon. La vitesse de balayage élevée et le faible grossissement proposé que pour la procédure de refroidissement dans les étapes 4.5 et 4.17, veiller à ce que erégion e d'intérêt est maintenu propre. Ceci est dû à la transmission de chaleur par le faisceau d'électrons de balayage qui maintient toujours légèrement une température supérieure à la température du reste des régions de l'échantillon qui agissent comme piège à condensation pour le gaz résiduel dans la chambre SEM. En règle générale, tous les paramètres indiqués à l'étape 4.24 pour la spectroscopie CL sont optimisés pour la mesure de la D dite ligne luminescence dans le silicium en vrac par le dispositif expérimental mis en place en fonction de la liste d'équipement. Les paramètres doivent être adaptés si les investigations de la luminescence doivent être effectués sur d'autres matériaux semi-conducteurs.
Indépendant de la gamme d'énergie de la luminescence observée, une limitation supplémentaire des mesures de CL résulte du miroir collecteur de lumière parce que la lumière provenant de procédés de recombinaison radiative dans tout le volume de recombinaison est recueillie par le miroir et détermine ainsi la valeur de gris du correspondant CL pixel d'image qui est assignée à la position du faisceau d'électrons sur la surface de l'échantillon. Étant donné que le diamètre du volume de recombinaison (qui est comparable au volume d'excitation) est supérieure à la taille des pixels, même à faible grossissement, cet effet provoque un étalement spatial du signal de luminescence et, par conséquent, limite la résolution spatiale. Néanmoins, l'enquête CL permet une imagerie de la distribution locale de luminescence mono- ou panchromatique avec une résolution spectrale moyenne et peut être combiné avec des enquêtes de photoluminescence pour donner une résolution spectrale plus élevée. Récemment, une méthode expérimentale alternative à CL mesures, une cartographie microscopique et spectroscopique de dislocation liés photoluminescence a été proposé par le groupe de Tajima et ses collègues 26. La résolution spatiale de la cartographie de photoluminescence est nettement plus faible que dans les images CL, mais les enquêtes de photoluminescence permet en outre la polarisation de la bande d'émission corre de niveau profondlated aux dislocations à déterminer dans LAGBs avec torsion et d' inclinaison des structures 27,28.
Dans le cas des enquêtes FEMC, qui donnent un aperçu des propriétés électriques des défauts étendus, il n'y a pas d'autres méthodes pour l'imagerie de la varier localement l'efficacité de charge-collection dans les matériaux semi-conducteurs avec une résolution spatiale comparable. Cependant, également pour les mesures de FEMC, les étapes critiques sont inclus dans le protocole. Donc, à l'étape 5.13, est prévu la variation de l'image FEMC température diminue de se produire à partir des propriétés dépendantes des défauts étendus de température. Cependant, la qualité des contacts peut changer à des températures inférieures à la température ambiante et donc influencer l'image de FEMC. La température affecte le contact Schottky, faite d'une couche appropriée de Al dans le cas de type p et Au, dans le cas du silicium de type n, en raison des différents coefficients de dilatation thermique séparant la couche de contact du silicon substrat. Par ailleurs, le contact ohmique réalisé par un eutectique de gallium et d'indium ne sont pas stables à des températures inférieures à 160 K. En général, la réduction de la qualité de contact conduit à une diminution de signal fortement FEMC pour les grandes surfaces. Dans ce cas, les contacts doivent être renouvelés. Pour les enquêtes de FEMC à la température ambiante, il est également envisageable que les contacts pour les mesures de EPCA peuvent être faits par liaison de l'échantillon à une plaque de support approprié. Une autre limitation instrumentale des mesures de EBIC est provoquée par la saillie du porte-pointes de contact au-dessus de la surface de l'échantillon. Pour éviter une collision entre le support de pointe de contact et la pièce polaire de la SEM le WD doit être d'au moins 15 mm.
Dans la procédure expérimentale pour les enquêtes ccEBSD qui peuvent être utilisés pour estimer le champ des défauts étendus souche à longue distance, les étapes suivantes sont essentielles. La partie la plus difficile de l'expérience est la préparation de l'échantillon, en particulier la dernière procédure de polissage (protocoledel n ° 3.1) qui doit être effectué avec soin pour éviter la formation de défauts de surface supplémentaires. Si aucun motif Kikuchi peut être obtenu, souvent la qualité de la surface de l'échantillon ne suffit pas. Cependant, à partir monocristaux de silicium avec des lignes de glissement sur la surface après la déformation plastique, un bon motif de diffraction peut être obtenu qui est bien adapté à la procédure d'évaluation des ccEBSD. La rugosité de surface de ces échantillons a été analysé par microscopie à force atomique produisant une variation de hauteur dans la plage allant jusqu'à 500 nm. Par conséquent, des contraintes internes très élevées ou des couches de surface amorphes semblent être responsables de motifs de diffraction floues plutôt que la finesse imparfaite de la surface de l'échantillon. Une autre question pourrait être un signal faible des électrons dispersés de manière cohérente par rapport à l'arrière-plan. Ensuite, une augmentation du courant de sonde à tension constante d'accélération et / ou une détermination plus précise du signal d'arrière-plan (étape protocole n ° 6.12) unre utile. Pour minimiser le mouvement de l'échantillon lors d'une mesure de ccEBSD de longue durée, il est recommandé de fixer l'échantillon mécanique (protocole n ° 3.2).
limitations instrumentales pour les enquêtes ccEBSD peuvent survenir si l'inclinaison de la surface de l'échantillon par rapport au faisceau d'électrons incident est réalisé par l'inclinaison de la scène. Il y a donc de fortes restrictions pour le mouvement de l'échantillon en raison d'un risque de collision avec la pièce polaire et les parois de la chambre. De plus, il est fortement recommandé d'utiliser uniquement balayages de lignes qui sont parallèles à l'axe d'inclinaison (et apparaissent donc horizontalement sur l'écran SEM), parce que, d'abord, des balayages verticaux ont une grande erreur de somme pour les tensions internes en raison de l'erreur de l'échantillon inclinaison. En second lieu, lors EBSD, la résolution latérale est plus élevée (facteur d'environ 3 à 70 ° d'inclinaison) le long de l'axe de basculement que lui est perpendiculaire. La limite inférieure pour la valeur des composants souche tenseur calculée pour Si des enquêtes sur les ccEBSD est d'environ2 x 10 -4 qui est l'erreur aléatoire. En outre, il faut souligner que la technique de ccEBSD ne peut être appliquée en présence de grandes rotations de maille (> 4 °) par rapport au point de référence, ou très proche de joints de grains, où les motifs EBSD de grains différents se chevauchent. La limitation physique des enquêtes de ccEBSD concernant la résolution spatiale de la détermination de la déformation est due à la plage de la diffraction des électrons qui a été trouvée être d'environ 50 nm le long de l'axe d'inclinaison de l'échantillon. En comparaison avec X-ray expériences de diffraction pour la détermination des tensions internes, ceci est un avantage évident en raison du volume d'interaction beaucoup plus importante de rayons X, même dans le cas de rayons X μ-diffraction. Pour les matériaux semi-conducteurs, l'étude des perturbations de l'indice de réfraction isotrope par un viseur polaire peut également être appliquée pour la détermination des contraintes internes, mais la résolution spatiale de ce procédé est inférieure àquelques centaines de nm 29. Une autre méthode pour la détermination de l'état de déformation en trois dimensions résolue spatialement dans les cristaux est basé sur la séparation des zones d'ordre supérieur Laue (Holz) lignes. Cette méthode doit être réalisée dans un microscope électronique à transmission (MET) en utilisant un biprisme à électrons pour l' interférométrie électronique 30. Cependant, contrairement aux enquêtes ccEBSD dans le SEM, l'enquête TEM nécessite la préparation d'une feuille de l'échantillon qui change les tensions internes dues à des effets de relaxation.
Dans des études ultérieures, les mesures de ccEBSD seront également effectués à des températures basses. Cela permettra à l'enquête, les propriétés structurales, optiques et électriques, non seulement sur le même défaut étendu, mais aussi à la même température.
Déclarations de divulgation
The authors have nothing to disclose.
Remerciements
Support of this work by the German Research Foundation (DFG) within the framework of the Research Training Group 1621 is gratefully acknowledged by Paul Chekhonin. All authors are grateful to Dietmar Temmler (Fraunhofer FEP Dresden) for providing the electron beam processed Si samples showing liquid phase re-crystallisation. Special thanks go to Stefan Saager and Jakob Holfeld for the preparation of the figures for the SEM equipment and the EBSD set-up. We thank Michael Stavola for detailed discussions and help with this work.
matériels
| Name | Company | Catalog Number | Comments |
| Cryogenic liquids: | Linde http://www.linde-gas.de, Air Liquide http://www.airliquide.de/ | ||
| Liquid helium ( LHe ) | for cooling of the cryostat | ||
| Liquid nitrogen ( LN2 ) | for cooling of the PMT R5509-73 | ||
| Indium wire | chemPUR http://chempur.de/ | 900898 | CL sample preparation: for good electrical and thermal coupling between cryostat and sample |
| Mica | plano GmbH http://www.plano-em.de/ | V3 | isolation of EBIC sample holder and good thermal coupling to the cryostat |
| Aluminium wire, gold wire | chemPUR http://chempur.de/ | 009013, 900891 | purity 99.99%, material for formation of Schottky contact for EBIC measurements |
| Indium-Gallium eutectic solution | Alfa Aesar | 12478 | to form ohmic contact on the backside of the sample for EBIC measurements |
| Liquid chemicalsVLSI Selectipur (de-ionized water, acetone, ethanol) | VWR | 52182674, 51152090 | for sample preparation: cleaning and surface treatment |
| Hydrofluoric acid | VWR | 1,003,382,500 | necessary to remove surface oxide layer on Silicon samples immediately before investigation; follow safety precautions! |
| MicroCloth | Buehler http://www.buehler.com/ | 40-7222 | polishing cloth |
| MasterMet 1 (0.02 µm) | Buehler http://www.buehler.com/ | 40-6380-006 | SiO2 polishing suspension |
| Scanning electron microscope (SEM) | Carl Zeiss AG http://www.zeiss.de/microscopy/ | Ultra 55 | field emission gun |
| SEM-CL system | EMSystems | customized, following equipment belongs to CL system: | |
| SEM stage for cryostat | Kammrath & Weiss http://www.kammrath-weiss.com | ||
| KONTI cryostat | Cryovac http://www.cryovac.de/ | 3-06-4609C-7674 | cooling of sample |
| Liquid He transfer line for KONTI cryostat | Cryovac http://www.cryovac.de/ | 3-01-3506C-SO | |
| Cryogenic Temperature Controller | Cryovac http://www.cryovac.de/ | TIC-304 MA | controlling the flow rate of cryogenic |
| Photomultiplier Tube (PMT) | Hamamatsu http://www.hamamatsu.com | R5509-73 | for NIR spectral range |
| PMT housing and cooler | Hamamatsu http://www.hamamatsu.com | C9940-2 | |
| HV power supply | Heinzinger electronic GmbH http://www.heinzinger.de/ | LNC 3000-10 neg | for operating of the PMT |
| Monochromator | Sol Instruments Ltd. http://www.solinstruments.com | MS2004i | |
| PMT | Hamamatsu http://www.hamamatsu.com | R3896 | for visible spectral range |
| CCD digital camera | Proscan GmbH, Proscan Special Instruments Ltd. http://www.proscan.de | HS 101 H | for visible spectral range |
| Control program | Proscan GmbH, Proscan Special Instruments Ltd. http://www.proscan.de | PSI line | for controlling spectral CL measurements with CCD or PMT detectors |
| Laptop | Dell | Latitude 110L | hardware for running the control program |
| LHe dewar | cryotherm http://www.cryotherm.de/ | Stratos 100 SL | container for cryogenic |
| LN2 dewar | container for cryogenic | ||
| Protective glasses | pulsafe | protective equipment | |
| Protective gloves | tempex | Protect line Mod. 4081052 | protective equipment |
| Heating tape | Thermocax Isopad GmbH http://www.isopad-solutions.com | IT-TeMS 6 | to prevent or reduce icing of the flexible hoses during cooling |
| Diaphragm pump | Vacuubrand GmbH & Co KG http://www.vacuubrand.com | ME4 | to provide the flow rate of the cryogenic |
| Vacuum accessoires: flexible hoses, seals, locking rings | connectors for cryogenic CL or EBIC set-up | ||
| Specimen current EBIC amplifier | KE developments / Deben http://deben.co.uk/ | Type 31 | Measuring the EBIC current |
| High vacuum chamber with metal evaporation | customized | formation of Schottky contact for EBIC measurements | |
| Heating plate | Retsch GmbH http://www.retsch.de | SG1 | CL sample preparation |
| EBSD detector Nordlys | HKL | no more available; can be replaced by the Oxford EBSD detectors NordlysMax3 or NordlysNano | |
| EBSD acquisition and evaluation software Channel 5 | HKL | no more available; can be replaced by the Oxford EBSD Software AZtecHKL | |
| ccEBSD program ccEBSD_v1.07.exe | in house written program | for use please contact authors | |
| EBSD interface with remote control system | Carl Zeiss AG http://www.zeiss.de/microscopy/ | necessary for the electron beam control and parameter transfer between EBSD system and SEM | |
| Vibromet2 | Buehler, http://www.buehler.com/ | 671635160 | vibratory polisher |
Références
- Alexander, H. Chapter 6, Dislocations. Electronic Structure and Properties of Semiconductors. Schröter, E. , Materials Science and Technology; 4. VCH Basel. 249-319 (1991).
- Mahajan, S. Defects in semiconductors and their effects on devices. Acta Mater. 48, 137-149 (2000).
- Holt, D. B., Yacobi, B. G. Extended Defects in Semiconductors- Electronic Properties, Device Effects and Structures. , Cambridge University Press. (2007).
- Hornstra, J. Models of grain boundaries in the diamond lattice. Physica. 25 (1-6), 409-422 (1959).
- Randle, V. Crystallographic characterization of planes in the scanning electron microscope. Mater. Charact. 34 (1), 29-34 (1995).
- Wilkinson, A. J., Meaden, G., Dingley, D. J. High-resolution elastic strain measurement from electron backscatter diffraction patterns: New levels of sensitivity. Ultramicroscopy. 106 (4-5), 307-313 (2006).
- Wilkinson, A. J., Meaden, G., Dingley, D. J. High resolution mapping of strains and rotations using electron backscatter diffraction: New levels of sensitivity. Ultramicroscopy. 106 (4-5), 307-313 (2006).
- Drozdov, N. A., Patrin, A. A., Tkachev, V. D. Recombination radiation on dislocations in silicon. JETP Lett. 23 (11), 597-599 (1976).
- Dean, P. J., Williams, G. M., Blackmore, G. Novel type of optical transition observed in MBE grown CdTe. J Phys. D: Appl. Phys. 17 (11), 2291-2300 (1984).
- Nacke, M., Allardt, M., Chekhonin, P., Hieckmann, E., Skrotzki, W., Weber, J. Investigations on residual strains and the cathodoluminescence and electron beam induced current signal of grain boundaries in silicon. J. Appl. Phys. 115 (16), 163511-1-163511-8 (2014).
- Ikeda, K., Sekiguchi, T., Ito, S., Suezawa, M. EBIC and Cathodoluminescence Study of the Bonded Silicon Wafers. Solid State Phenom. 63-64, 481-488 (1998).
- Sekiguchi, T., Ito, S., Kanai, A. Cathodoluminescence study on the tilt and twist boundaries in bonded silicon wafers. Mater. Sci. Eng. B. 91-92 (4), 244-247 (2002).
- Lee, W., Chen, J., Chen, B., Chang, J., Sekiguchi, T. Cathodoluminescence study of dislocation-related luminescence from small-angle grain boundaries in multicrystalline silicon. Appl. Phys. Lett. 94, 112103(2009).
- Donolato, C. Theory of beam induced current characterization of grain boundaries in polycrystalline solar cells. J. Appl. Phys. 54 (3), 1314-1322 (1983).
- Kittler, M., et al. Regular Dislocation Networks in Silicon as a Tool for Nanostructure Devices used in Optics, Biology, and Electronics. Small. 3 (6), 964-973 (2007).
- Kveder, V., Kittler, M., Schröter, W. Recombination activity of contaminated dislocations in silicon: A model describing electron-beam-induced current contrast behavior. Phys. Rev. B. 63, 115208(2001).
- Higgs, V., Lighthowlers, E. C., Norman, C. E., Kightley, P. Characterisation of dislocations in the presence of transition metal contamination. Mater. Sci. Forum. 83-87, 1309-1314 (1992).
- Donolato, C., Bell, R. O. Characterization of grain boundaries in polycrystalline solar cells using a computerized electron beam induced current system. Rev. Sci. Instrum. 54 (8), 1005-1008 (1983).
- Wilkinson, A. J., Meaden, G., Dingley, D. J. chap. 17, Mapping Strains Using Electron Backscatter Diffraction. Electron Backscatter Diffraction in Material Science. Schwartz, A. J., Kumar, M., Adams, B. L., Field, D. P. , 2nd Edition, Kluwer Academics/Plenum Publishers. New York. 231-249 (2009).
- Childs, G. B., Ericks, L. Y., Powell, R. W. National Bureau of Standards. Thermal Conductivity of Solids at Room Temperature and Below: A Review and Compilation of the Literature. , http://digital.library.unt.edu/ark:/67531/metadc13173/m1/1 (1973).
- Yacobi, B. G., Holt, D. B. Cathodoluminescence Microscopy of Inorganic Solids. , Plenum Press. New York. (1990).
- Everhart, T. E., Hoff, P. H. Determination of Kilovolt Electron Energy Dissipation vs Penetration Distance in Solid Materials. J. Appl. Phys. 42 (13), 5837-5846 (1971).
- Zaefferer, S., Elhami, N. N. Theory and application of electron channelling contrast imaging under controlled diffraction conditions. Acta Mater. 75, 20-50 (2014).
- Schulze, G. Metallphysik. , Akademie Verlag. Berlin. (1967).
- Jiang, J., Britton, T. B., Wilkinson, A. J. Evolution of intragranular stresses and dislocation densities during cyclic deformation of polycrystalline copper. Acta Mater. 94, 193-204 (2015).
- Inoue, M., Sugimoto, H., Tajima, M., Oshita, Y., Ogura, A. Microscopic and spectroscopic mapping of dislocation-related photoluminescence in multicrystalline silicon wafers. J. Mater. Sci.: Mater. Electron. 19, 132-134 (2008).
- Kato, G., Tajima, M., Toyota, H., Ogura, A. Polarized photoluminescence imaging analysis around small-angle grain boundaries in multicrystalline silicon wafers for solar cells. Jpn. J. Appl. Phys. 53, 080303(2014).
- Tajima, M. Spectroscopy and Topography of Deep-Level Luminescence in Photovoltaic Silicon. IEEE J. Photov. 4 (6), 1452-1458 (2014).
- Yablon, A. D. Optical and mechanical effects of frozen-in stresses and strains in optical fibres. IEEE J. Sel. Top. Quant. 10 (2), 300-311 (2004).
- Herring, R., Norouzpour, M., Saitoh, K., Tanaka, N., Tanji, T. Determination of three-dimensional strain state in crystals using self-interfered split HOLZ lines. Ultramicroscopy. 156, 37-40 (2015).
Réimpressions et Autorisations
Demande d’autorisation pour utiliser le texte ou les figures de cet article JoVE
Demande d’autorisationThis article has been published
Video Coming Soon