Method Article
Análise quantitativa do local atômico de defeitos funcionais/pontos em materiais cristalinos por Microanálise Aprimorada por Canalização eletrônica
Neste Artigo
Resumo
Fornecemos um esboço geral de métodos quantitativos de microanálise para estimar as ocupações do local de impurezas e seus estados químicos, aproveitando fenômenos de canalização eletrônica sob condições de agitação de raios-elétron incidentes, que extraem informações confiáveis de espécies minoritárias, elementos de luz, vagas de oxigênio e outros defeitos point/line/planar.
Resumo
Um novo esquema de análise elementar e química baseado em fenômenos de canalização de elétrons em materiais cristalinos é introduzido, onde o feixe de elétrons de alta energia do incidente é balançado com o ponto de pivô submicrométrico fixado em um espécime. Este método nos permite derivar quantitativamente as ocupações do local e informações químicas dependentes do local de impurezas ou elementos funcionais intencionalmente dopados em um espécime, usando espectroscopia de raios-X dispersivas de energia e espectroscopia de perda de energia eletrônica ligada a um microscópio eletrônico de transmissão de varredura, que é de interesse significativo para a ciência dos materiais atuais, particularmente relacionada às nanotecnologias. Este esquema é aplicável a qualquer combinação de elementos mesmo quando a análise rietveld convencional por raios-X ou difração de nêutrons ocasionalmente falha em fornecer os resultados desejados devido a tamanhos amostrais limitados e fatores de dispersão próximos de elementos vizinhos na tabela periódica. Neste artigo metodológico, demonstramos o procedimento experimental básico e o método de análise da atual microanálise de balanço de feixes.
Introdução
Com a demanda de redução da maioria dos produtos industriais atuais, está ficando cada vez mais importante entender as propriedades físicas/químicas dos materiais a partir da perspectiva microscópica, às vezes em termos de estruturas espaciais/eletrônicas em escala atômica. Novas propriedades são frequentemente descobertas inesperadamente ao sintetizar materiais por tentativa e erro, selecionando diferentes números ou tipos de elementos, embora as técnicas de medição atuais e cálculos teóricos ab initio baseados na teoria funcional da densidade tenham ativado o design de novos materiais com propriedades melhoradas sem experiências de tentativa e erro demoradas. Por exemplo, alguns dos átomos hospedeiros são substituídos por outros elementos que podem possivelmente melhorar a propriedade-alvo como resultados de considerações experimentais ou teóricas. Nesse contexto, um importante componente da informação experimental é trazido a partir do conhecimento detalhado da posição de cada constituinte na estrutura atômica do material.
Os métodos de difração de raios-X e/ou nêutrons são convencionalmente e amplamente utilizados não apenas porque a análise estrutural baseada na análise de Rietveld1,2 técnicas tem sido bem estabelecida e aberta ao público, mas também devido ao desenvolvimento de fontes de raios-X de alto fluxo (por exemplo, instalações de radiação síncrotron) e fontes modernas de nêutrons, que são facilmente acessíveis a pesquisadores gerais. No entanto, essas técnicas requerem amostras com estruturas homogêneas, e também requerem o ajuste rietveld entre os conjuntos experimentais e teóricos de intensidades de pico difratadas usando fatores estruturais. Pode, portanto, ser difícil distinguir entre diferentes elementos se seus fatores estruturais estão próximos uns dos outros, como na difração de raios-X de elementos vizinhos na tabela periódica.
Na maioria dos materiais avançados atuais, as composições, precipitados, tamanho do grão e impurezas são ajustadas e otimizadas para maximizar o papel desejado na escala de nanômetros. Isso significa que esses materiais requerem caracterização na escala de nanômetros ou mesmo na escala de subnômetros para investigar se são sintetizados como projetados. Nesse contexto, poderia ser melhor alcançado utilizando microscopia eletrônica de transmissão (TEM) e técnicas analíticas relacionadas.
O recente desenvolvimento dramático da varredura DO TEM (STEM) nessas décadas, particularmente baseado em tecnologias de correção de aberração, acelerou uma técnica de última geração para revelar a estrutura de um material e sua distribuição elementar em escala atômica3,4. Este método, no entanto, requer a fixação precisamente do material cristalino paralelo a um eixo de zona de baixa ordem e à extrema estabilidade do instrumento durante a medição, o que é uma desvantagem. Assim, demonstramos um método alternativo que não requer tais limitações, correção de aberração ou mesmo arma eletrônica de emissão de campo.
A canalização de elétrons em um material cristalino ocorre se um feixe de elétrons incidente se propaga ao longo de determinados planos atômicos ou colunas, o que depende da direção do feixe de elétrons de alta energia incidente em relação aos eixos de cristal, onde um conjunto apropriado de reflexões de Bragg e o erro de excitação de cada reflexão em um TEM são selecionados. A técnica de análise de raios-X de dispersão de energia específica do local (EDX ou às vezes convencionalmente EDS) que usa canalização de elétrons é chamada de localização do átomo pelo método de microanálise eletrônica canalizada (ALCHEMI) para avaliar as ocupações dos locais atômicos hospedeiros por impurezas5,6. Este método foi estendido para uma abordagem mais complexa e quantitativamente confiável, chamada espectroscopia de raios-X de alta resolução angular (HARECXS), para determinar ocupações de impureza/dopant. Isso é realizado comparando as curvas experimentais de balanço de feixe com simulações teóricas7. Esta técnica é ainda estendida à espectroscopia eletrônica de alta resolução angular (HARECES), que registra espectros de perda de energia eletrônica (EELS) em vez de EDX8. Isso fornece informações sobre os estados químicos locais específicos do local de um determinado elemento em diferentes ambientes atômicos9,10,11. Nos casos em que cada elemento hospedeiro ocupa um único local cristalográfico, uma simples regressão linear e aplicação de várias fórmulas ao conjunto de dados experimental determina quantitativamente as ocupações do local de impurezas dopadas sem simulações teóricas.
Nas seções a seguir, fornecemos procedimentos detalhados do método específico para o sistema STEM Jeol JEM2100 porque ele está explicitamente equipado com o modo de balanço de feixe no menu de operação STEM. Para usuários de outros microscópios, consulte as descrições no parágrafo final da seção Discussão deste artigo.
Protocolo
1. Pré-processo de amostra
- Preparação de filme fino para TEM
- Prepare uma amostra para o presente método de análise utilizando técnicas de preparação de amostras de microscopia eletrônica de transmissão padrão (TEM), como eletropolishing para materiais metálicos, fresagem de íons para semicondutores ou cerâmicas, tipicamente menos de 100-200 nm para HARECXS, uniformemente plana sobre a área de ~1 μm. Prepare amostras mais finas (50-100 nm) para HARECES em geral.
- Montagem da amostra para TEM
- Monte a película fina preparada em um suporte de amostra TEM de inclinação dupla, seguido de inserir o suporte em um TEM equipado com um modo de digitalização e um detector EDX(Figura 1).
2. Operação TEM (específica para JEM2100 STEM com opção de balanço de feixe anexada)
- Alinhamento TEM para balanço de feixes
- Inicie a operação TEM. Após o procedimento de alinhamento de feixe tem de rotina, vá para o modo STEM verificando o Acessório Scanning Image Display (ASID) na janela ASID no monitor de controle TEM (TCM, Figura 1 & Figura 2).
- Alinhamento do eixo óptico
- Clique no botão Balanço na janela ASID do TCM e clique no botão Localizar no SIV (Simple Image Viewer, visualizador de imagem simples) para parar de balançar o feixe(Figura 2). Remova a amostra do campo de visão. Defina o alcance de balanço do feixe menor que ±2° clicando nos botões de incremento/decréscrição mag.
- Gire o botão brilho no painel de operação esquerda (LOP: Figura 3) no sentido horário até o limite, seguido de girar o botão OBJ FOCUS coarse do Painel de Operação Direita (ROP: Figura 3) no sentido anti-horário para uma condição subfocada: um ponto cáustico(Figura 4) aparece na tela de visualização fluorescente.
- Pressione a tecla de função TILT BRIGHT (LOP) e mova o ponto cáustico para o centro da tela fluorescente usando um par de botões DEF/STIG X/Y (L/ROP).
- Pressione o botão Padrão Foco (ROP) e, em seguida, gire o botão BRIGHTNESS para trás no sentido anti-horário para que um ponto cáustico alternativo apareça na tela fluorescente.
- Pressione a tecla de função F3 (ROP) (ou clique no botão Spot na janela 'Painel de alinhamento para manutenção' no TCM) e mova o ponto de feixe para o centro usando um par de botões DEF/STIG X/Y.
- Repetimos as etapas 2.2.2-2.2.5 até que a posição do feixe permaneça no centro mesmo que a condição da lente seja trocada na etapa 2.2.2 e 2.2.4.
- Colisão de feixe de incidentes e definição de seu ponto de pivô
- Introduza a terceira maior abertura de condensador no centro do eixo óptico girando o botão de abertura no sentido horário com sua posição ajustada manualmente com dois parafusos conectados(Figura 1). Em seguida, ajuste o estigmador da lente condensadora para corrigir a forma do feixe a ser coaxialmente desfocado girando o botão BRIGHTNESS para ambos os lados, usando um par de botões DEF/STIG com a tecla COND STIG.
- Pressione a tecla HT WOBB (ROP) e ajuste o botão TILT BRILHANTE para minimizar a flutuação do tamanho do feixe com a mudança na tensão de aceleração. Este processo ajusta o mínimo de ângulo de convergência do feixe. Pressione novamente a tecla HT WOBB para parar o oscilador HT.
- Ativar o modo de manutenção (consulte o manual do fabricante). Selecione JEOL na barra de menu → a janela Digitalização/Foco → guia Controle de varredura em TCM. Em seguida, clique no botão Cor e clique no botão Digitalizar em vez de localizar no painel de controle de imagem do SIV.
- Para minimizar o câmbio do feixe com a balança do feixe, ajuste um par de botões DEF/STIG, seguido de girar o botão OBJ FOCUS FINE ligeiramente no sentido anti-horário. Por fim, combine a altura da amostra e do ponto pivô usando as teclas de controle Z (ROP) para que a amostra esteja focada na tela fluorescente.
- Alinhamento final do feixe para obter padrão de canalização eletrônica da amostra
- Mova a área de interesse da amostra de volta para o centro e comece a balançar o feixe clicando no botão Digitalizar na janela SIV. Gire manualmente no sentido horário o cilindro do detector de campo escuro anular (Figura1)e insira o detector.
- Ajuste a posição do detector ADF no centro da posição do feixe ajustando um par de botões DEF/STIG com chave PLA (LOP: Figura 3). Verifique o botão STEI-DF no menu Image Select da janela ASID e o monitor STEM na janela SIV exibe um padrão de canalização eletrônica (ECP). Ajuste o brilho/contraste na janela ASID para ver melhor o ECP. Gire ligeiramente o botão BRIGHTNESS para ver o contraste ECP mais nítido.
- Aquisição de dados para HARECXS pela EDX
- Ao operar o STEM no modo de balanço de feixe, colete o espectro EDX seguindo o método convencional de imagem espectral (usando a função de imagem espectral na Figura 5) em função de ângulos de inclinação do feixe nas direções x e y e exiba a distribuição de intensidade elementar para elementos especificados, conforme mostrado na Figura 5.
NOTA: O padrão de distribuição de intensidade é chamado de padrão de canalização de ionização (ICP). - Use a função De varredura de linha na Figura 5 para a medição de inclinação 1D de uma linha sistemática de reflexões. A seta amarela aparece na pré-visualização ECP para especificar o intervalo de medição, como mostrado no painel superior esquerdo na Figura 5. Pare as medições quando forem obtidas estatísticas de dados suficientes para ICPs.
- Ao operar o STEM no modo de balanço de feixe, colete o espectro EDX seguindo o método convencional de imagem espectral (usando a função de imagem espectral na Figura 5) em função de ângulos de inclinação do feixe nas direções x e y e exiba a distribuição de intensidade elementar para elementos especificados, conforme mostrado na Figura 5.
3. Análise de dados para quantificação
- Intensidade expressa de raios-X Ix para impureza x na seguinte forma em função da intensidade de raio-X Ii do elemento hospedeiro i,12

onde
NOTA: Aqui, fix é a ocupação fracionária de impureza x no site tipo i host, cx é a concentração de impureza x, e ni é a concentração fracionária do elemento host tipo i entre os locais de hospedagem total antes da acomodação de átomos de impureza do tipo x. ki é o fator k do elemento tipo i host. O deslocamento constante adicional βx foi introduzido como um parâmetro extra equipado para explicar as diferenças na deslocalização de interação e erros nas subtrações de fundo. αix pode ser derivado de Eq. (1) por regressão linear multivariada para muitos pontos amostrais das intensidades de raios-X do ICP. - Deriva cx e f ix utilizando a condição Σifix = 1 as12

As incertezas em cx e fix para múltiplas impurezas são prontamente derivadas do princípio da propagação de erros:
e
onde δ αix é o erro estatístico obtido na regressão linear de Eq. (1).
Resultados
O ECP experimental para BaTiO3 e ICPs de Ba-L, Ti-Kαe O-Kα perto dos eixos [100] e [110] são mostrados na Figura 6A e Figura 6B, respectivamente. Cada elemento constituinte exibe uma CPI específica, indicando que a CPI é específica do local atômico12.
Como exemplo fundamental de aplicação, examinamos a Transição De 2 SnO 4 , dopada por Eu3+, que exibe forte emissão vermelha derivada da transição de dipolo elétrico 5D0-7F2 dos íons trivalentes da União Europeia (Eu3+). Considerando o critério de similaridade do raios iônicos, seria mais relevante supor que o Eu3+ ocupa os sites ca2+ porque o Eu3+ é significativamente próximo em tamanho ao Ca2+ do que ao Sn4+. No entanto, a análise de Rietveld dos dados de difração de raios-X em pó revelou que o Eu3+ também ocupou os locais Ca2+ e Sn4+, presumivelmente porque o critério de neutralidade de carga local domina neste caso. Uma amostra de eu e Y co-dopada Ca1.8Y0.2Eu0.2Sn0.8O4 foi então sintetizada porque íons Y3+ com um raio iônico menor ocupam preferencialmente locais menores de cáção (Sn4+) locais, expulsando íons eu3+ maiores do site Sn4+ para o site maior ca2+ sem alterar o saldo de carga. Como esperado, o Ca1.8Y0.2Eu0.2Sn0.8O4 apresentou uma emissão mais forte do que a amostra Ca1.9Eu0.2Sn0.9O4. A emissão vermelha mais forte na amostra co-dopada é explicada pela maior fração de íons eu3+ ocupando o local assimétrico de Ca, coordenado por sete átomos de oxigênio, o que melhora o momento do dipolo elétrico em comparação com o do sn simétrico de seis coordenadas.
Foram preparadas uma série de amostras de policristalino co-dopadas por Eu e Y com composições nominais de Ca1.9Eu0,2Sn0,9O4 e Ca1.8Eu0.2Y0.2Sn0.8O4, e as ocupações dos dopantes foram determinadas pelo método atual.
A Figura 7 mostra os ECP e ICPs de Ca-K, Sn-L, O-K, Eu-L e Y-L para a ca1.8Eu0.2Y0.2Sn0.8O4 amostra perto da zona [100]. O ICP Da Eu-L estava mais próximo do CPC Ca-K, enquanto o ICP Y-L estava mais próximo do ICP Sn-L. Isso sugere que os locais de ocupação da União Europeia e de Y podem ser tendenciosos, como esperado. Os coeficientes, αix para i = Ca, Sn e x = Eu, Y derivados usando Eq. (1), onde nCa = 2/3 e nSn = 1/3. Os k-fatores dos elementos constituintes são calibrados antecipadamente utilizando-se um material de referência com uma composição conhecida, a discussão detalhada da qual é encontrada no ref.12. As ocupações do local fix (Eq. (3)) das impurezas, e as concentrações de impureza c de todas as amostras são tabuladas na Tabela 1.
Em Ca1.9Eu0.2Sn0.9O4, Eu3+ ocupou os sites Ca2+ e Sn4+ igualmente, consistente com os resultados da análise XRD-Rietveld. Em contraste, Eu3+ e Y3+ ocuparam os sítios Ca2+ e Sn4+ em proporções de aproximadamente 7:3 e 4:6, respectivamente, nas amostras co-dopadas, significativamente tendenciosas como esperado, mas também mantendo a condição de neutralidade de carga dentro das atuais precisãos experimentais12.
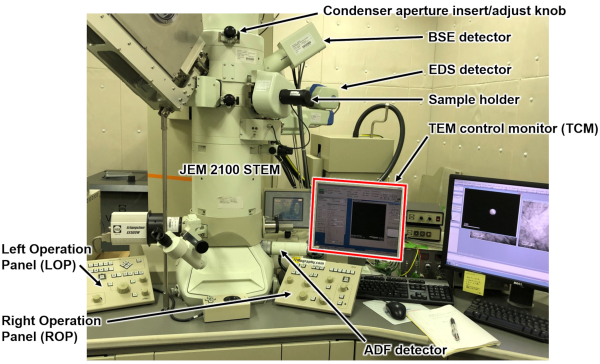
Figura 1: Perspectiva instrumental. Jeol JEM2100 STEM e suas configurações de monitores, detectores e painéis de operação associados. Clique aqui para ver uma versão maior desta figura.

Figura 2: Layout do monitor de controle TEM (TCM). As janelas de controle necessárias para o presente método são exibidas e as funções e botões das teclas são rotulados. Clique aqui para ver uma versão maior desta figura.

Figura 3: Painéis de operação esquerdo/direito do painel de operação S/TEM. (Esquerda) Esquerda (LOP). (À direita) Painel de operação certo. As teclas de função e os botões de operação necessários para o presente método são rotulados. Clique aqui para ver uma versão maior desta figura.

Figura 4: Imagem de ponto cáustico na tela fluorescente. O diâmetro da mancha varia alguns centímetros na tela, dependendo do valor do desfoco. Clique aqui para ver uma versão maior desta figura.
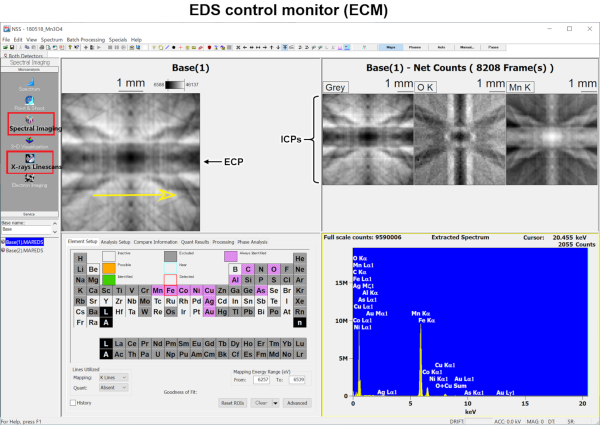
Figura 5: Aparecimento do monitor de controle EDS. A visualização do padrão de canalização eletrônica (ECP) no painel superior esquerdo especifica a área de medição. Para medições de inclinação 1D, o Linecan de raios-X é selecionado no painel mais à esquerda e a faixa de medição é indicada pela seta amarela na visualização ECP. A tabela periódica no painel inferior esquerdo seleciona os elementos dos padrões de canalização de ionização (ICPs) a serem exibidos no painel superior direito. O painel inferior direito exibe o padrão EDS acumulado em tempo real. Clique aqui para ver uma versão maior desta figura.

Figura 6: ECPs experimentais e ICPs. (A: da esquerda para a direita) ECP e ICPs de Ba-L, T-Ka, e O-Kuma emissão de BaTiO3 obtidas pelo eixo de zona de feixe perto [100]. (B: da esquerda para a direita) O mesmo que (A) perto de [110] eixos de zona. Este valor foi modificado a partir de [12]. Clique aqui para ver uma versão maior desta figura.
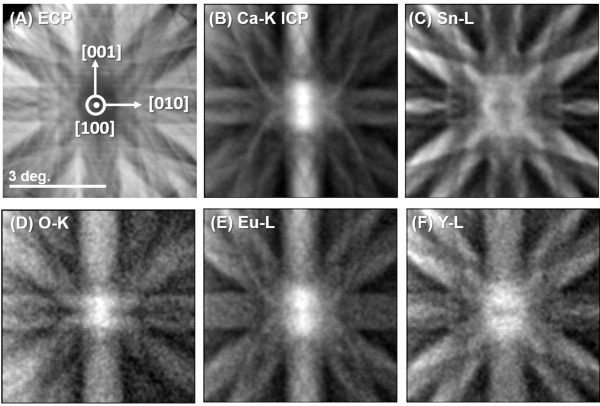
Figura 7. ECP e ICPs de raios-X correspondentes de Ca1.8Eu0.2Y0.2Sn0.8O4 por feixe de balanço perto do eixo [100] zona. (A)ECP. (B-F) ICPs de Ca-Ka, Sn-L, O-Ka,O-Ka,Eu-L e Y-L, respectivamente. Este valor foi modificado a partir de [12]. Clique aqui para ver uma versão maior desta figura.
| amostra | Dopant | α | αSn | fCa | fSn | c x (x = Eu ou Y) |
| Ca1.9Eu0.2Sn0.9O4 | UE | 1.71±0.001 | 0,083±0.001 | 0,57±0.001 | 0.43±0.002 | 0,061±0.001 |
| Ca1.8Eu0.2Y0.2Sn0.8O4 | UE | 0.162±0.001 | 0,077±0.001 | 0,78±0.003 | 0.22±0.008 | 0,088±0.006 |
| Y | 0,040±0.002 | 0.265±0.009 | 0.28±0.002 | 0,72±0.001 | 0.118±0.004 |
Mesa 1. Parâmetros derivados (definidos em texto) das amostras de Ca2-xEuxSn1-y yyO4 onde (x, y) =(0,2, 0,0) e (0,2, 0,2).
Discussão
Passos críticos no protocolo são a capacidade de alinhar com precisão o feixe de balanço incidente que tem um pequeno ângulo de convergência com o ponto de pivô, que é imóvel na área especificada descrita nas etapas 2.2-2.3. Foi utilizado um feixe de incidentes colidido com um semiângulo de convergência de aproximadamente não maior que 2 mrad. Um feixe de 400 nm e diâmetro de 1 μm pode ser selecionado definindo a abertura do condensador #4 (10 μm de diâmetro) e #3 (30 μm) no atual sistema de hardware.
As vantagens do presente método são que (i) não são necessários instrumentos AVANÇADOs de STEM, como STEM corrigido por aberração ou mesmo arma eletrônica de emissão de campo; (ii) muitos pontos de amostragem (por exemplo, ~4.000 pontos para uma área de varredura de 64 × 64 pixels2) podem ser coletados automaticamente com alta eficiência, ao operar o procedimento convencional de imagem espectral STEM no lado do analisador, e (iii) múltiplos métodos espectroscópicos como EDX, EELS e cathodoluminescence podem ser operados simultaneamente em um único sistema integrado, o que permite a análise multimodal13.
Uma vez que as ICPs experimentais podem ser precisamente previstas por simulação teórica, o método pode ser aplicado não apenas a casos em que o cristal de interesse contém múltiplos sítios atômicos inequivalentes para um elemento dopado14. Outras extensões estão em andamento, como a detecção das concentrações de vacância e deslocamentos associados dos elementos hospedeiros15,e até mesmo a encomenda de dopants segregados ao longo dos limites de grãos da cerâmica. O presente método pode fornecer uma técnica alternativa significativa aplicável a amostras relativamente grossas em contraste com a análise de coluna por coluna atômica usando STEM corrigido pela aberração, o que requer a preparação de amostras muito finas de alta qualidade (< 10 nm).
A análise eletrônica eletrônica do átomo usando TEM-EELS (HARECES) em vez de EDX é viável8,9,10,11. Para medição automática é recomendado o uso da 'opção ALCHEMI' em um software de controle de feixe 'QED', em execução no Gatan Microscope Suite, fornecido pela HREM Research Inc16. Na medição hareces, é necessário garantir que o feixe transmitido esteja longe da posição do detector EELS e perpendicular à linha sistemática na sequência de inclinação do feixe8.
Uma limitação deste método é o tamanho mínimo do feixe de feixe de elétrons incidente, que limita a área mínima medida a aproximadamente 400 nm. Isso se deve à aberração do sistema de lentes TEM, onde o centro de pivô se move mais longe do que o raio de feixe para um tamanho menor de feixe, que poderia ser alterado no futuro modificando a configuração atual da lente defletor TEM para compensar a perambulação do feixe.
Se o microscópio usado não tiver modo de balanço de feixe, uma operação muito semelhante é alcançada usando o software QED, que também aborda a limitação, pois o software pode corrigir o ponto pivô movendo-se mesmo no modo nano-feixe. Para S/TEMs fabricados pela FEI Company (agora parte da Thermo Fisher Scientific), o scripting TIA, código de código aberto pode gerenciar todas as funções S/TEM e detectores conectados através de um PC. As aquisições de dados sequenciais EDX/EELS com inclinação sucessiva do feixe de incidentes foram realizadas utilizando-se o programa de scripting TIA em execução na plataforma de imagem e análise TEM13.
Divulgações
Os autores não têm nada a revelar.
Agradecimentos
Este trabalho foi parcialmente apoiado por Grants-in-Aid for Scientific Research on Kiban-kenkyu A (No. 26249096), Innovative Areas "Nano Informatics" (No. 25106004) e Wakate-kenkyu B (nº 26870271) da Sociedade Japonesa da Promoção da Ciência.
Materiais
| Name | Company | Catalog Number | Comments |
| Electron Energy-Loss Spectrometer | Gatan Inc. | Enfina1000 | Parallel EELS detector |
| Energy dispersive X-ray detector | JEOL Ltd. | SD30GV | EDS silicon drift detector |
| Gatan Microscope Suite (GMS) | Gatan Inc. | ver. 2.3. | Integrated software platform for controling cameras, detectors, S/TEM and data analysis |
| QED | HREM Research Inc. | for GMS 2.3 32bit | beam controlling software, running on the Gatan Microscope Suite |
| scanning transmission electron microscope | JEOL Ltd. | JEM-2100 | Beam-rocking mode option in ASID controlling window |
| TEMCON | JEOL Ltd. | Control software for JEM 2100 | |
| Thermo NSS software | Thermo Fischer Scientific Inc., USA | EDS control software |
Referências
- Rietveld, H. M. A profile refinement method for nuclear and magnetic structures. Journal of Applied Crystallography. 2, 65-71 (1969).
- Izumi, F., Ikeda, T. A Rietveld-analysis program RIETAN-98 and its applications to zeolites. Materials Science Forum. 321-324, 198-203 (2000).
- Rose, H. H. Optics of high-performance electron microscopes. Science and Technology of Advanced Materials. 9, 014107 (2008).
- Muller, D. A., et al. Atomic-scale chemical imaging of composition and bonding by aberration- corrected microscopy. Science. 319, 1073-1076 (2008).
- Spence, J. C. H., Taftø, J. ALCHEMI: A new technique for locating atoms in small crystals. Journal of Microscopy. 130, 147-154 (1982).
- Taftø, J., Spence, J. C. H. Crystal site location of iron and trace elements in an Mg-Fe olivine using a new crystallographic technique. Science. 218, 49-51 (1982).
- Yasuda, K., Yamamoto, T., Matsumura, S. The atomic structure of disordered ion tracks in magnesium aluminate spinel. Journal of Microscopy. 59, 27 (2007).
- Tatsumi, K., Muto, S. Local electronic structure analysis by site-selective ELNES using electron channeling and first-principles calculations. Journal of Physics Condensed Matter. 21, 1-14 (2009).
- Yamamoto, Y., Tatsumi, K., Muto, S. Site-selective electronic structure of aluminum in oxide ceramics obtained by TEM-EELS analysis using the electron standing-wave method. Materials Transactions. 48, 2590-2594 (2007).
- Tatsumi, K., Muto, S., Nishida, I., Rusz, J. Site-specific electronic configurations of Fe 3d states by energy loss by channeled electrons. Applied Physics Letters. 96, 201911 (2010).
- Tatsumi, K., Muto, S., Rusz, J. Energy loss by channeled electrons: A quantitative study on transition metal oxides. Microscopy and Microanalysis. 19, 1586-1594 (2013).
- Muto, S., Ohtsuka, M. High-precision quantitative atomic-site-analysis of functional dopants in crystalline materials by electron-channelling-enhanced microanalysis. Progress in Crystal Growth and Characterization of Materials. 63, 40-61 (2017).
- Yamamoto, Y., et al. Quantitative analysis of cation mixing and local valence states in LiNixMn2-xO4 using concurrent HARECXS and HARECES measurements. Microscopy. 65, 253-262 (2016).
- Ohtsuka, M., Muto, S., Tatsumi, K., Kobayashi, Y., Kawata, T. Quantitative determination of occupation sites of trace Co substituted for multiple statistical beam-rocking TEM-EDXS analysis. Microscopy. 65, 127-137 (2016).
- Ohtsuka, M., Oda, K., Tanaka, M., Kitaoka, S., Muto, S. 2D-HARECXS analysis of dopant and oxygen vacancy sites in Al-doped yttrium titanate. J. Amer. Ceram. Soc. , (2021).
- . QED for DigitalMicrograph Available from: https://www.hremresearch.com/Eng/plugin/QEDEng.html (2020)
Reimpressões e Permissões
Solicitar permissão para reutilizar o texto ou figuras deste artigo JoVE
Solicitar PermissãoExplore Mais Artigos
This article has been published
Video Coming Soon
Copyright © 2025 MyJoVE Corporation. Todos os direitos reservados