Method Article
Fabricación de diodos de Schottky en Zn-polar heteroestructura de BeMgZnO/ZnO por Epitaxy de viga Molecular asistida por Plasma
En este artículo
Resumen
Consecución de contactos Schottky de alta calidad es imprescindible para lograr la modulación eficiente puerta en transistores de efecto de campo de heteroestructura (HFETs). Presentamos la metodología de fabricación y características de los diodos de Schottky en heteroestructuras de Zn-polar BeMgZnO/ZnO con alta densidad gas dos de dimensiones del electrón (2DEG), crecidos por epitaxy de viga molecular asistida por plasma en plantillas de GaN.
Resumen
Heteroestructura transistores de efecto de campo (HFETs) utilizando un canal de dos dimensiones del electrón (2DEG) de gas tienen un gran potencial para aplicaciones de dispositivos de alta velocidad. Óxido de zinc (ZnO), un semiconductor con banda prohibida ancha (3,4 eV) y velocidad de saturación alta electrónica ha ganado mucha atención como un material atractivo para dispositivos de alta velocidad. Modulación de puerta eficiente, sin embargo, requiere de contactos Schottky de alta calidad en la capa de barrera. En este artículo, presentamos nuestro procedimiento de fabricación del diodo Schottky en Zn-polar BeMgZnO/ZnO heteroestructura con 2DEG de alta densidad que se logra a través de la modulación de la tensión y la incorporación de unos pocos por ciento estar en la barrera de MgZnO durante el crecimiento por epitaxy de viga molecular (MBE). Para lograr alta calidad cristalina, casi comparable a enrejado alta resistividad GaN plantillas crecidas por deposición química metal-orgánica de vapor (MOCVD) se utilizan como sustrato para el posterior crecimiento MBE de las capas de óxido. Para obtener el requisito Zn-polaridad, cuidado tratamiento superficial de GaN se utilizan plantillas y control sobre la relación VI/II durante el crecimiento de la capa de ZnO nucleación de baja temperatura. Electrodos de ti/Au sirven como contactos óhmicos y electrodos de Ag en el plasma de2 O pretratados BeMgZnO de superficie se utilizan para contactos Schottky.
Introducción
Heteroestructura transistores de efecto de campo (HFETs) basados en dos gas de dimensiones del electrón (2DEG) tienen un potencial prometedor de las aplicaciones en dispositivos electrónicos de alta velocidad1,2,3. Óxido de zinc (ZnO) como un semiconductor de banda prohibida ancha (3,4 eV) con velocidad de saturación alta electrónica ha ganado considerable atención como una plataforma para HFETs4,5. Barrera convencionalmente usado material MgZnO ternario requieren un muy alto contenido de Mg (> 40%) cultivadas en sustrato baja temperatura (300 ° C o inferior)6,7y como tal estas estructuras pueden degradar bajo operaciones de alta potencia y durante los tratamientos térmicos, aunque la densidad de carga no deseada en la barrera es lo suficientemente baja como para modulación de la puerta. Para sortear este obstáculo, hemos propuesto y adoptado BeMgZnO como la barrera, en que la señal de tensión en la barrera puede ser cambiada de compresión a tracción a través de la incorporación de berilio (sea), hacer la espontánea y piezoelectricpolarizations a ser aditiva. Como resultado, 2DEG alta concentración se logra con relativamente moderado contenido de Mg. Utilizando este enfoque, 2DEG altas densidades se observa cerca del plasmon-LO resonancia phonon (~ 7 × 1012 cm-2) en heteroestructuras de ZnO/BeMgZnO mientras que el contenido de Mg a continuación es del 30% y el ser contenido está sólo a 2 ~ 3%8.
Debido a su simetría de cristal similares, UV y visible transparencia ligera, robustas propiedades físicas y químicas y bajo costo, plano de c zafiro se emplea extensamente para epitaxy de GaN y ZnO. Gracias a los notables avances en la tecnología de crecimiento de GaN electrónica y dispositivos optoelectrónicos en saphhire, GaN plantillas de alta calidad pueden fácilmente producir sobre sustratos de zafiro con AlN o buffer de baja temperatura (LT) GaN, a pesar de su desajuste grande enrejado de 16% con zafiro9. Crecimiento epitaxial de ZnO, que tiene un desajuste aún mayor de enrejado en el plano del 18% con zafiro, se entiende relativamente bien para variedad O polares, mientras que el crecimiento de material polar de Zn en modo bidimensional no está bien establecido. Debido el desajuste moderado enrejado de 1,8%, epitaxy de ZnO en GaN es una alternativa atractiva.
MOCVD y MBE son las más exitosas técnicas de deposición de semiconductores para la fabricación de películas delgadas de alta calidad y heteroestructuras con alta reproducibilidad. La razón principal que MBE es menos popular que MOCVD para epitaxy de GaN es el costo y la insuficiencia de la producción en masa. La tasa de crecimiento en GaN por MOCVD puede ser varios micrómetros por hora y decenas de obleas de 2 pulgadas (50 mm) de diámetro o tan grandes como 6-8" se puede cultivar en una ejecución9. Aquí, también adoptamos MOCVD para el crecimiento de GaN en nuestro estudio. Para el desarrollo de heteroestructuras basadas en ZnO, sin embargo, informes más en la formación de 2DEG se realizan mediante la MBE en la actualidad antes de la comercialización de los potenciales usos10,11,12. Recientemente, hemos desarrollado crecimiento MBE de heteroestructuras de ZnO de alta calidad con un control preciso de la polaridad superficial GaN Ga polar plantillas13. Se encontró que con el tratamiento de pre-exposición de Zn, ZnO capas tan crecida expuesta Zn-polaridad cuando nucleadas con proporciones bajas de VI/II (< 1,5), mientras que aquellos nucleados con ratios de VI/II por encima de 1.5 exhibieron O polaridad. Para evitar el canal de conducción paralela a través de plantillas de GaN, adoptamos carbono compensado parcialmente aislante MOCVD GaN cultivadas bajo condiciones de baja presión en buffer de AlN para el posterior crecimiento de estructuras basadas en ZnO HFET.
Antes nuestro trabajo14, no ha habido informes en la investigación de los diodos de Schottky en heteroestructuras de BeMgZnO/ZnO. Sólo varios estudios han informado de contactos Schottky MgZnO15,16, e.g., con un factor de idealidad de 2.37, una altura de 0,73 eV y una relación de rectificación de sólo 103 15. Varios metales de Schottky se han utilizado para ZnO17, y entre ellos, plata (Ag) ha sido ampliamente adoptado, debido a una relativamente alta Schottky barrera altura de 1,11 eV grueso ZnO con un factor de idealidad de 1.08 18.
En este trabajo, nuestro objetivo es fabricar diodos Schottky de alta calidad para las aplicaciones en dispositivos HFET alta velocidad basadas en ZnO. El siguiente protocolo se aplica específicamente a la fabricación de diodos de Schottky Ag/BeMgZnO/ZnO por evaporación e-beam del Ag en las heteroestructuras de ZnO/BeMgZnO crecido por MBE asistida por plasma en plantillas de MOCVD depositado GaN.
Protocolo
1. crecimiento y preparación de la plantilla de GaN para crecimiento MBE
- Crecimiento de semi aislamiento plantilla de GaN por MOCVD
- Asegúrese de que está cerrada la compuerta de aislamiento de la cámara de bloqueo de carga del reactor. Ventile el bloqueo de carga con N2 a presión atmosférica. Abrir la cerradura de la carga para tomar el soporte del sustrato.
- El sustrato de zafiro de 2 pulgadas en el soporte de carga y luego coloque el soporte en el bloqueo de carga. Bomba por la presión de bloqueo de carga hasta 2,5 × 10-2 Torr por una bomba mecánica seca.
- Ventile el bloqueo de carga con N2 para igualar la presión con en el compartimiento del reactor (15 Torr).
- Abrir la válvula de compuerta de aislamiento de bloqueo de carga y carga el titular en la Asamblea de sostenedor de la muestra en el reactor. Encienda el motor de rotación y ajustar la velocidad de rotación de substrato sostenedor de 100 rpm. Luego, cierre la válvula de compuerta.
- Asegurar que el agua de refrigeración está funcionando, ambos de H2 y NH3 fuente es suficiente, flujo controlador (MFC) y lecturas de presión control (PC) son las mismas que los puntos de ajuste, y gire el soporte del sustrato.
- Cambiar el gas del sistema de N2 H2. Encienda el monitor de reflectancia óptica en situ .
- A partir del archivo de la receta, que preinstala todos los parámetros de crecimiento incluyendo la rampa de temperaturas del sustrato, las tasas de flujo de gas y presión del reactor y conmutación de las válvulas para iniciar el crecimiento.
- Rampa para arriba de la presión del reactor a 30 Torr en 3 min y la temperatura del substrato a 1055 ° C para la desorción la contaminación residual de la superficie del sustrato por 3 min en el entorno de2 H.
- Rampa de bajada de la temperatura del substrato a 941 ° C para la nucleación y crecimiento de la capa del almacenador intermediario de baja temperatura (LT) AlN.
- Estabilizar el flujo trimethylaluminum (TMAl) 12 centímetro cúbicos estándar por minuto (sccm) y amoniaco (NH3) flujo 7 sccm y la temperatura del substrato durante 3 minutos.
- Iniciar el crecimiento de la capa de LT-AlN TMAl de conmutación del tubo de ventilación a la línea de ejecución.
- Controlar el espesor de la capa de LT-AlN mediante un sistema de medición de reflectividad a la medida, que incluye un diodo de láser de 637 nm, un p-i-n Si fotodetector y un software basado en Labview. Determinar la tasa de crecimiento del período de oscilaciones de reflectividad19,20. En las muestras seleccionadas, utilice transversales imágenes de microscopía electrónica barridas microscopia electrónica y transmisión para confirmar la exactitud del monitoreo en situ .
- Mantener el crecimiento durante 6 min alcanzar un espesor de ~ 20 nanómetro y rampa encima de la temperatura del substrato a 1100 ° C en 3 minutos sin una interrupción del crecimiento y continuar con el crecimiento de AlN capa a un espesor de 300 nm, como controlar la evolución de la oscilación de la en s ITU reflectancia óptica.
- Interruptor TMAl de correr a la salida y luego a línea ociosa para detener el crecimiento de la AlN. Estabilizar el flujo de trimethylgallium (TMGa) en 15,5 sccm, rampa el flujo de NH3 a 7000 sccm y estabilizar durante 1 minuto rampa encima de la presión del reactor a 76 Torr en 1 min rampa encima de la temperatura del substrato a 1107 ° C en 1 minuto.
- Nuclear y crecer una capa de recuperación GaN con un espesor de ~ 400 nm, vigilando la evolución de la reflectividad. Inicialmente la reflectividad exhibe una disminución aguda cuando GaN islas nuclea en superficie de AlN y luego recupera la intensidad al nivel original correspondiente a un plano atómico cuando se unen las islas.
- Rampa hasta el sustrato a 1124 ° C en 2 minutos crece la capa de GaN semi-aislamiento de alta temperatura con un espesor de ~2.5 m. detener el crecimiento cambiando TMGa de correr a la salida y luego a línea ociosa.
- Enfriar el sustrato a la temperatura ambiente durante un período de 40 minutos.
- Rampa de bajada de la presión del reactor a 15 Torr durante 1,5 minutos.
- Descargar el sustrato del reactor siguiendo el procedimiento inverso de pasos 1.1.1-1.1.4.
- Preparación de plantilla de GaN y la carga al reactor de MBE
- Corte la plantilla de GaN de 2 pulgadas en 6 pedazos iguales en forma de pastel por usando un diamante.
- Preparar solución ácida de agua regia dentro de la campana de humo ácido añadiendo ácido nítrico (HNO368.0 70.0 w/w%, 50 mL) de ácido clorhídrico (HCl, 36.5-38.0 w/w%, 150 mL) poco a poco en un vaso de cuarzo.
- Poner el vaso de agua regia en un plato caliente con una temperatura de 220 ° C.
- Después de la aparición de un color naranja y rojo y las burbujas de gas, empape una plantilla en forma de pastel del GaN en la solución y hervir durante 10 minutos.
- Enjuague la plantilla GaN en agua desionizada (DI) durante 3 minutos.
- Tomar la plantilla de GaN en HCl (solución236.5-38.0 w/w%):H O (1:1) por 3 min quitar óxido de Ga.
- Enjuague la plantilla GaN DI agua durante 5 minutos.
- Seque la plantilla con gas de N2 .
- Poner la plantilla de GaN limpia en un soporte de Mo y carga en la cámara de bloqueo de carga MBE inmediatamente.
- Empezar a bombear hacia abajo el bloque de carga por una bomba mecánica seca.
2. el MBE crecimiento de heteroestructuras BeMgZnO/ZnO
- Preparación de las células de efusión
- Después de bombear hacia abajo el bloque de carga para 1 h, iniciar la preparación de Zn, Mg, células de efusión. Ajustar la temperatura de la zona superior de la célula de Zn de doble zona a 525 ° C con una tasa de rampa de 17 ° C/min, espere 5 minutos y luego rampa hasta 515 ° C con una tasa de rampa de 5 ° C/min conjunto la temperatura de la célula de Mg a 570 ° C con una tasa de rampa de 15 ° C/min , después de alcanzar el punto de ajuste, espere 10 minutos y luego rampa la célula Mg hasta 300 ° C. Establecer el ser temperatura de la celda a 900 ° C con una tasa de rampa de 10 ° C/min, después de alcanzar el punto de ajuste, espere 3 minutos y luego rampa la célula hasta 650 ° C.
- Después de 30 min, establecer la temperatura más baja de la zona de la célula de Zn zona doble a 360 ° C con una tasa de rampa de 10 ° C por minuto.
- Después de bombear hacia abajo el bloque de carga por 2 h para llegar a una presión de ~ 5 × 10-7 Torr, encienda el sistema de difracción (RHEED) de electrón de gran energía de reflexión y cargar la plantilla de GaN en la cámara MBE.
- Ajustar el ángulo de la plantilla de GaN haciendo girar el manipulador para monitorear la evolución del patrón RHEED en dirección acimutal [1-100].
- Establecer la temperatura más baja de la zona de la célula de Zn zona doble a 355 ° C con una tasa de rampa de 10 ° C por minuto.
- Control de la polaridad de ZnO en GaN y el crecimiento de LT-ZnO tampón
- Rampa para arriba de la temperatura del substrato a 615 º C con una tasa de rampa de 13,6 ° C/min para la desorción la contaminación residual de la superficie del sustrato durante 15 minutos.
- Rampa de bajada de la temperatura del substrato de 615 a 280 ° C con una tasa de rampa de 13,6 ° C/min para el crecimiento de LT-ZnO. Cuando la temperatura alcanza los 550 ° C, abra el obturador de la célula de Zn para exponer la superficie de la plantilla de GaN con flujo de Zn. Abra el suministro de energía O2 plasma, establecer la potencia 100 W, y verificación para comprobar que está cerrada la línea de gas O2 .
- Cuando la temperatura alcanza los 280 ° C, ajustar la energía del plasma O2 a 400 W, caudal de juego O2 a 0,3 sccm para encender el plasma entonces disminuir la tasa de flujo de O2 a 0.25 sccm.
- Espere 1 minuto, luego abra el obturador de2 O para iniciar el crecimiento de la capa del almacenador intermediario LT-ZnO.
- Grabar un patrón de RHEED cada 5 min. Después de crecer durante aproximadamente 15 minutos correspondiente a un espesor de búfer de ~ 20 nanómetro, cuando el patrón RHEED cambia de rayas (modo 2D) a manchas elípticas (modo 3D), cerrar persianas de Zn y O2 para detener el crecimiento.
- Establece la tasa de flujo de O2 en 0,4 sccm y establece la temperatura del substrato a 730 ° C con una tasa de rampa de 13,6 ° C/min hasta templar la capa del almacenador intermediario LT-ZnO. Establecer la temperatura más baja de la zona de la célula de Zn zona doble a 345 ° C con una tasa de rampa de 10 ° C/min para el crecimiento de la capa de ZnO HT.
- Cuando la temperatura del substrato alcanza el punto de 730 ° C, espere 5 minutos y Compruebe la superficie del ZnO por RHEED. Cuando el patrón RHEED transita de 3D a 2D, stop recocido por la rampa hacia abajo de la temperatura del substrato a 700 ° C.
- Crecimiento de la capa de ZnO de alta temperatura
- Cuando la temperatura del substrato llega a 700 ° C y se estabiliza, aumentar la tasa de flujo de O2 a 3.2 sccm.
- Iniciar el crecimiento de la capa de ZnO HT abriendo persianas de Zn y O2 al mismo tiempo.
- Crecer la capa de ZnO HT ~ 140 min llegar a un espesor de ~ 300 nanómetro. Registrar a los patrones RHEED varias veces durante el crecimiento para confirmar el modo de crecimiento 2D.
- Detener el crecimiento de la capa de ZnO HT cerrando persianas de Zn y O2 al mismo tiempo.
- Crecimiento de BeMgZnO barrera
- Definir la tasa de flujo de O2 a 0,3 sccm, definir la temperatura de la célula a 820 ° C con una tasa de rampa de 10 ° C/min, ajustar la temperatura de la célula de Mg a 510 ° C con una tasa de rampa de 15 ° C/min y ajustar la temperatura del substrato a 325 ° C con una tasa de rampa de 13,6 ° C/min para el crecimiento de la barrera BeMgZnO.
- Cuando se estabilice la temperatura del substrato, aumentar la tasa de flujo de O2 a 1.25 sccm, y comenzar el crecimiento concurrente apertura de Zn, Mg, ser y O2 .
- Crecer la capa de barrera de BeMgZnO ~ 12 minutos llegar a un espesor de ~ 30 nm. Los patrones de registro RHEED varias veces durante el crecimiento para controlar la evolución del modo de crecimiento.
- Detener el crecimiento de la capa de BeMgZnO por el cierre de la Mg y manteniendo los de Zn y O2 ser obturador, obturador abierto durante 1 minuto tener una capa de tapa ZnO gruesa de ~ 2 nm.
- Para terminar el crecimiento, cerrando las contraventanas de Zn y O2 .
- Rampa de bajada de la temperatura del substrato a su espera temperatura 150 ° C. Disminuir la tasa de flujo de O2 a 0.25 sccm.
- Cuando la temperatura del substrato está por debajo de 250 ° C, disminuyen la energía del plasma O2 a 100 W, apague el suministro de energía de plasma O2 , disminuir la tasa de flujo de O2 a 0, cerca de la línea de gas O2 y enfriar las temperaturas de la célula en espera condiciones.
- Espere a que la temperatura del substrato alcancen la temperatura de espera de 150 ° C, abra la válvula de puerta de cámara de crecimiento y descargan el titular de la oblea a la cámara de bloqueo de carga.
- Ventilar la cámara de bloqueo de carga con gas de2 N y sacar la muestra.
3. caracterizaciones
- Aproximadamente miden el espesor de la muestra utilizando un analizador de paso a través del área cubierto en el borde de la muestra.
- Evaluar la calidad grosor, tensión y estructural de la heteroestructura usando difracción de rayos x (HRXRD) (2q-w las exploraciones de reflexión (0002)) de alta resolución.
- Cortar la muestra de 5 × 5 mm pieza cuadrada de2 por usando un diamante. Investigar las propiedades electrónicas de la muestra mediante el uso de medidas de efecto Hall dependiente de la temperatura en la geometría de van der Pauw, con indio (In) puntos como electrodos.
- Comprobar la morfología superficial mediante microscopía de fuerza atómica (AFM).
4. fabricación de diodos de Schottky
- Fabricación de contactos óhmicos en heteroestructuras de ZnO/BeMgZnO
- Desgrasar la muestra (~ 20 × 20 mm2 en tamaño) con acetona en un limpiador ultrasónico durante 5 minutos, seguido por limpieza con metanol en el limpiador ultrasónico durante 5 minutos, enjuague en agua desionizada durante 5 min y soplado seco con N2.
- Girar la capa de photoresist con 1000 rpm durante 3 s y entonces 3000 rpm por 30 s.
- Suave, cueza al horno la fotoresistencia a 100 ° C 140 s.
- Exponer con luz a través del contacto óhmico UV máscara en potencia de la lámpara de 6.5 mW UV 2,38 minutos en alineador de máscara de fotolitografía.
- Puesto cueza al horno la fotoresistencia a 110 ° C 80 s.
- Convertirse en un desarrollador para 60 s con una frecuencia de agitación de 1 m/s.
- Enjuague en agua desionizada para 3 minutos y seque con N2.
- La muestra de la carga en el evaporador de haz de electrones.
- Sin calentar la muestra, depositar Ti/Au con un espesor de 30/50 nm, medida por el monitor de cristal de cuarzo grueso.
- Despegue en acetona, seguida de limpieza en metanol durante 5 minutos, enjuague en agua desionizada durante 5 min y soplado seco con N2.
- Recueza el contacto por annealer termal rápido (RTA) a 300 ° C para 30 s.
- Compruebe la resistencia de contacto a través de la línea de transición modelo (TLM) medida21.
- Fabricación de contactos Schottky en heteroestructuras de ZnO/BeMgZnO
- Siga los pasos 4.1.1-4.1.7 para Fotolitografía de contacto Schottky.
- Tratar la superficie de la muestra con control remoto plasma de2 O 5 min con un flujo de O2 de sccm 35 y una potencia de RF de 50 w.
- Siga los pasos 4.1.8-4.1.10 para el depósito de Ag con un espesor de 50 nm.
- Caracterizar la estructura obtenida por mediciones-V para los diodos de Schottky17.
Resultados
La columna de la izquierda de la figura 1 muestra la evolución de RHEED patrón registrado en la dirección azimutal [1-100] durante el crecimiento MBE de un ser heteroestructura de ZnO/ZnO de0.260.02Mg con una capa HT-ZnO 300 nm y 30 nm de espesor ser0.02 Barrera de ZnO de0.26Mg. La columna derecha muestra representativas morfologías superficiales en diferentes etapas de crecimiento (no de la misma muestra). Como se evidencia de la aparición de un patrón irregular de RHEED, la capa del almacenador intermediario LT-ZnO es de la naturaleza de modo tridimensional (3D) Isla crecimiento. Su morfología superficial fue mejorado por el tratamiento térmico de recocido a una temperatura superior a 700 ° C. Se ve claramente que la superficie transformada de 3D a 2D morfología. La posterior capa de ZnO HT sigue creciendo en modo 2D, seguido por el crecimiento 2D de ser0.02Mg0.26ZnO capa sin la formación de una segunda fase. AFM las mediciones han demostrado que la plantilla de GaN tiene una rugosidad media cuadrática (RMS) de 0,28 nm para 5 × 5 μm2 exploración. Una superficie suave con una rugosidad RMS de 0.35 nm se obtiene de la capa de ZnO HT sin una barrera creciente bajo condición O ricos y una rugosidad RMS de 0.45 nm se observa tras el crecimiento de la barrera BeMgZnO.
HRXRD triple eje 2θ =-ω analizar un Zn-polar típico ser heteroestructura de ZnO/ZnO de0.260.02Mg con una capa HT-ZnO 300 nm y un 50 nm espesor ser0.02Mg0.26ZnO capa de barrera se muestra en la figura 2. Las reflexiones en 34.46 o, 34.54 oy 34.75 o concuerdan con reflejos (0002) de ZnO, GaN y ser0.02Mg0.26ZnO, respectivamente. Tenga en cuenta que la ampliación de la reflexión de ser0.02Mg0.26ZnO es debido a su delgadez. La resistencia a tensión biaxial en la capa de ZnO es una indicación de la heteroestructura Zn-polar, como investigados en nuestro anterior estudio13. Ser y se calcularon los contenidos de Mg en el cuaternario de la BeMgZnO desde el ángulo de Bragg de su DRX (0002) reflexión y emisión de energía del fotón en LT-fotoluminiscencia (LT PL) espectro medido a 13 K (no mostrado).
La figura 3 muestra los resultados de las medidas de efecto Hall de dependientes de la temperatura de un ser0.02Mg0.26ZnO/ZnO heteroestructura. La concentración de portador de hoja reducido de 8.8 × 1012 cm-2 6.4 × 1012 cm-2 cuando la muestra fue enfriada a temperatura ambiente (293 K) a aproximadamente 100 K. Con refrigeración por más de 13 K, la concentración de portador de la hoja se satura a 6.2 × 1012 cm-2. Este hallazgo pone de manifiesto que la reducción observada en la concentración de electrones se origina de las aportaciones de los canales de conducción paralela que incluyen defectuoso nucleación capa y capa de ZnO HT así como ser0.02Mg0.26ZnO barrera, si cualquier. Esta tendencia también se ha divulgado para MgZnO/ZnO heteroestructuras10,22. La movilidad de electrón en la ser0.02Mg0.26heteroestructura de ZnO/ZnO aumenta monótonamente con la disminución de temperatura; la movilidad de 293 K de 206 cm2/Vs y la movilidad de 13 K de 1550 cm2/Vs son comparables a los valores en la literatura,,2223. La evolución de las propiedades electrónicas en función de la temperatura indica claramente la presencia de 2DEG en la ser0.02Mg0.26ZnO/ZnO heterointerface.
Figura 4 muestra el voltaje de la corriente (-V) curvas medición a temperatura ambiente durante cuatro representante Ag / ser0.02Mg0.26diodos Schottky de ZnO/ZnO con una superficie de Schottky de 1,1 × 10-4 cm2 dentro de una oblea. Las corrientes hacia adelantadas aumentan exponencialmente con la tensión aplicada hasta 0.25 V, más allá de que las caídas de voltaje a través de la resistencia en serie que se hacen evidente. La mayor altura de barrera Schottky de Φap de 1,07 eV se logró con una n de factor de idealidad de 1.22. Ratios de rectificación de aproximadamente 1 × 108 se logran mediante el uso de los valores actuales medidos en V= ±2 V.
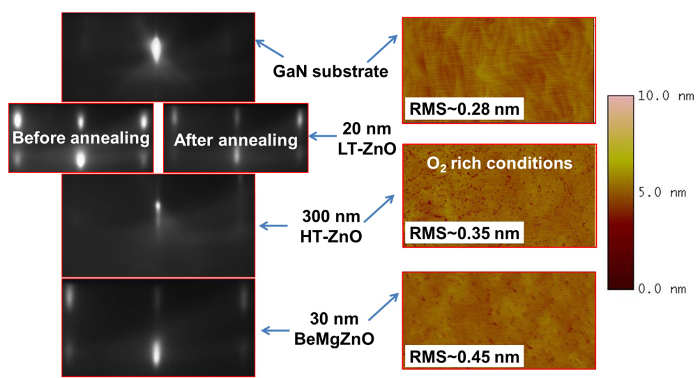
Figura 1. Caracterización de la superficie. Columna de la izquierda muestra los patrones RHEED tomados a lo largo de la dirección acimutal [1-100] crecimiento MBE de una heteroestructura de0.02Mg0.26ZnO/ZnO, y columna de la derecha presenta la morfología superficial de la plantilla de GaN, capa de HT-ZnO, ser 0.02capa de ZnO de0,26Mg medida por AFM. LT-ZnO buffer tecnología permite el crecimiento de modo 2D de alta calidad ZnO heteroestructuras en baja no coinciden el enrejado GaN plantillas. Haga clic aquí para ver una versión más grande de esta figura.
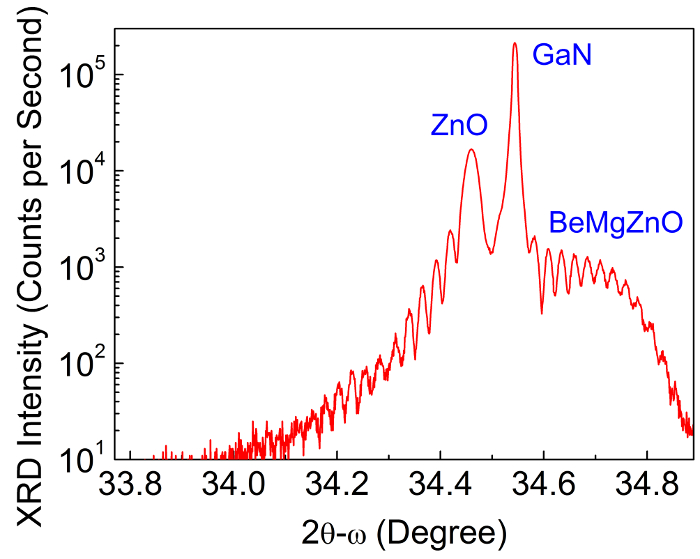
Figura 2. HRXRD de la heteroestructura. HRXRD triple eje 2θ =-ω escaneo de un típico Zn polar ser0.02Mg0.26heteroestructura de ZnO/ZnO con 50 nm de espesor ser0.02Mg0.26capa de ZnO. Las reflexiones en 34.46 o, 34.54 oy 34.75 o concuerdan con reflejos (0002) de ZnO, GaN y ser0.02Mg0.26ZnO, respectivamente. Haga clic aquí para ver una versión más grande de esta figura.
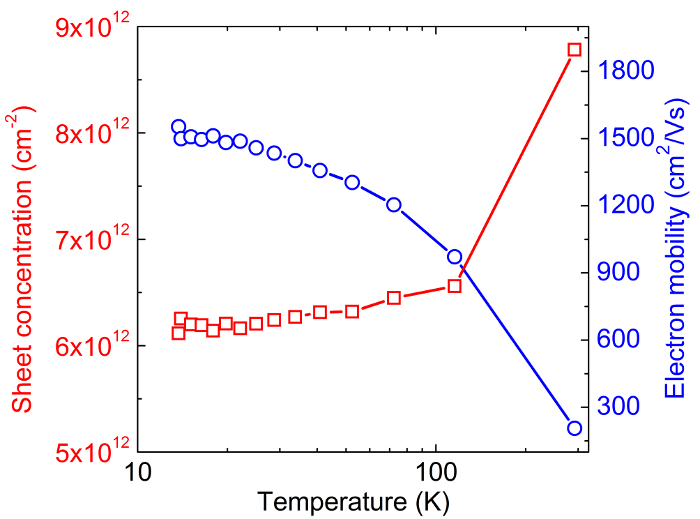
Figura 3. Propiedades electrónicas de la heteroestructura. Dependencias de temperatura de hoja portadora densidad y electrón movilidad de Zn-polar ser0.02Mg0.26ZnO/ZnO heteroestructura. Haga clic aquí para ver una versión más grande de esta figura.

Figura 4. Diodos de Schottky. Características típicas -V de cuatro representante Ag / medir diodos de Schottky de ZnO/ZnO de0.26de0,02Mg a temperatura ambiente. La similitud de las cuatro curvas-V indica la alta uniformidad en la oblea de la muestra. Haga clic aquí para ver una versión más grande de esta figura.
Discusión
Incorporación de BeO MgZnO para formar el BeMgZnO cuaternario proporciona la viabilidad para ajustar la magnitud y signo de tensión en el cuaternario, por lo tanto, aumenta significativamente la densidad 2DEG del8. Los resultados representativos muestran que el ser0.02Mg0.26ZnO/ZnO heteroestructura resulta en una densidad de 2DEG cerca plasmon deseada-LO phonon resonancia electrón densidad (~ 7 × 1012 cm-2)24. Aunque la movilidad de electrón de la heteroestructura depende fuertemente de los parámetros de crecimiento de la MBE tales como la temperatura del substrato y relación VI/II HT-ZnO y la capa de barrera de BeMgZnO, la densidad de 2DEG es débil depende de las condiciones de crecimiento y determinado principalmente por el ser y el contenido de Mg en la barrera.
Una plantilla de GaN se utiliza para el crecimiento de BeMgZnO/ZnO heteroestructuras con alta calidad cristalina debido el desajuste moderado enrejado de 1,8% entre el GaN y ZnO, en comparación con un desajuste grande enrejado de 18% entre zafiro y ZnO. Para evitar cualquier conductora canal paralelo, es crítico contar con una alta resistencia en el rango MΩ/Plaza de la plantilla de GaN. En nuestro caso, esto se logra por el aumento en una presión en la cámara baja de 76 Torr para mejorar la compensación de carbono. Para asegurar el control de la polaridad en las heteroestructuras BeMgZnO/ZnO (Zn-polaridad), cuidado de tratamiento superficial de plantilla de GaN es indispensable. Cualquier oxidación o contaminación durante la preparación de la superficie de GaN induciría Zn-O-mezcla-polaridad y en heteroestructuras incluso la determinante relación VI/II < 1,5 se ha cumplido.
Cualquier reacción química entre el metal y el semiconductor, la presencia de contaminantes de la superficie, Estados, defectos en las proximidades de la superficie y la difusión del metal en el semiconductor son problemas comunes en el campo de la fabricación de Schottky contactos. Una variedad de métodos se ha divulgado en la literatura para la preparación de la superficie del ZnO para la fabricación contacto Schottky. Entre ellos se encuentran grabado grabado en ácido clorhídrico (u otros ácidos), física con Ar+, limpieza, tratamiento en H2O2y O2 plasma (o mezcla con él) de UV ozono25,26,27, 28. los procedimientos de grabado apuntar para la remoción de una capa superficial con el grueso de una que van desde unos pocos nanómetros a micras y por lo tanto no se puede aplicar para dispositivos HFET. La UV-ozono limpieza o procedimiento de plasma2 O elimina sólo la capa superficial. Por lo tanto, es idóneo para la preparación de la superficie de nuestra BeMgZnO/ZnO heteroestructuras.
Contactos Schottky se logran depositando un metal de alta función de trabajo tales como Pd, Pt, Ir, etcetera. Por el contrario, Ag tiene una función de trabajo baja de 4,26 eV. A pesar de eso, dispositivos utilizando electrodos de Ag pueden mostrar comportamiento de rectificación debido a la formación de una capa de óxido de plata de interfaz causada por la oxidación de Ag con oxígeno de matriz de ZnO. La capa de óxido así formada es transparente para los electrones y tiene la más alta función de trabajo en comparación con Ag. Raju et al. han reportado funciones de trabajo alrededor de 5,5 eV para hace crecido por deposición de láser pulsado (PLD), que es mayor que 1,3 eV de Ag y cerca de la característica de Ir, Pd y Pt29. Nuestros resultados indican que ese electrodo de Ag (con O2 plasma tratamiento previo en la superficie del ZnO heteroestructura) es un prometedor contacto metal para la formación de los diodos de Schottky.
Hemos demostrado un método para la fabricación de contactos Schottky de alta calidad para HFETs basadas en ZnO. Plantilla de GaN MOCVD crecido con cuidadosa preparación de la superficie justo antes de crecimiento MBE y una proporción baja de VI/II < 1.5 durante la nucleación de ZnO garantizar la orientación Zn-polar de las heteroestructuras basadas en ZnO con alta calidad. MOCVD es una técnica madura utilizado por epitaxia de GaN para diversas aplicaciones. El procedimiento MBE que se describe en este trabajo indica la compatibilidad de técnicas MOCVD y MBE y semiconductores GaN y óxido para los dispositivos electrónicos. Incorporación de una pequeña cantidad de estar en los resultados de capa barrera BeMgZnO en HFETs 2DEG alta densidad, movilidad de electrón alto y alta estabilidad térmica, para mejorar funcionamiento de alta velocidad.
Divulgaciones
Los autores no tienen nada que revelar.
Agradecimientos
Este trabajo fue apoyado por fuerza aérea oficina de científicos investigación (AFOSR) bajo concesión FA9550-12-1-0094.
Materiales
| Name | Company | Catalog Number | Comments |
| MOCVD | Emcore | custom-built | |
| MBE | SVT Associates | ||
| TMAl | SAFC | CAS: 75-24-1 | |
| TMGa | SAFC | CAS: 1445-79-0 | |
| NH3 | The Linde group | CAS: 7664-41-7 | |
| H2 | National Welders Supply Co. | supplier part no. 335-041 | Grade 5.0 |
| O2 | National Welders Supply Co. | supplier part no. OX 300 | Industrial Grade Oxygen, Size 300 Cylinder, CGA-540 |
| Mg | Sigma-Aldrich | Product No.: 474754-25G | MAGNESIUM, DISTILLED, DENDRITIC PIECES, 99.998% METALS BASIS |
| Be | ESPI Metals | Stock No. K646b | Beryllium pieces, 3N |
| Zn | Alfa Aesar, Thermo Fisher Scientific Chemicals Inc. | Product No.: 10760-30 | Zinc shot, 1-6mm (0.04-0.24in), Puratronic, 99.9999% |
| Au | Kurt J. Lesker | part no. EVMAUXX40G | Gold Pellets, 99.99% |
| Ag | Kurt J. Lesker | part no. EVMAG40QXQ | Silver Pellets, 99.99% |
| Ti | Kurt J. Lesker | part no. EVMTI45QXQ | Titanium Pellets, 99.995% |
| Developer | Rohm and Haas electronic Materials LLC | MF-CD-26 | Material number 10018050 |
| Photoresist | Rohm and Haas electronic Materials LLC | SPR 955 | Material number 10018283 |
Referencias
- Morkoc, H., Solomon, P. M. The hemt: A superfast transistor: An experimental GaAs-AlGoAs device switches in picoseconds and generates little heat. This is just what supercomputers need. IEEE spectrum. 21 (2), 28-35 (1984).
- Aktas, O., et al. Microwave performance of AlGaN/GaN inverted MODFET's. IEEE Electron Device Letters. 18 (6), 293-295 (1997).
- Leach, J. H., et al. Effect of hot phonon lifetime on electron velocity in InAlN/AlN/GaN heterostructure field effect transistors on bulk GaN substrates. Applied Physics Letters. 96 (13), 133505 (2010).
- Sasa, S., et al. Microwave performance of ZnO/ZnMgO heterostructure field effect transistors. Physica status solidi (a). 208 (2), 449-452 (2011).
- Ye, D., et al. Enhancement-mode ZnO/Mg0.5Zn0.5O HFET on Si. Journal of Physics D: Applied Physics. 47 (25), 255101 (2014).
- Koike, K., et al. Molecular beam epitaxial growth of wide bandgap ZnMgO alloy films on (111)-oriented Si substrate toward UV-detector applications. Journal of Crystal Growth. 278 (1-4), 288-292 (2005).
- Du, X., et al. Controlled Growth of High-Quality ZnO-Based Films and Fabrication of Visible-Blind and Solar-Blind Ultra-Violet Detectors. Advanced Materials. 21 (45), 4625-4630 (2009).
- Ding, K., Ullah, M., Avrutin, V., Özgür, &. #. 2. 2. 0. ;., Morkoç, H. Investigation of high density two-dimensional electron gas in Zn-polar BeMgZnO/ZnO heterostructures. Applied Physics Letters. 111 (18), 182101 (2017).
- Ding, K., Avrutin, V., Özgür, &. #. 2. 2. 0. ;., Morkoç, H. III-Nitride Light-Emitting Diodes. Wiley Encyclopedia of Electrical and Electronics Engineering. , 1-21 (2017).
- Tsukazaki, A., et al. Quantum Hall effect in polar oxide heterostructures. Science. 315 (5817), 1388-1391 (2007).
- Tsukazaki, A., et al. Observation of the fractional quantum Hall effect in an oxide. Nat Mater. 9 (11), 889-893 (2010).
- Falson, J., et al. MgZnO/ZnO heterostructures with electron mobility exceeding 1 x 10(6) cm(2)/Vs. Sci Rep. 6, 26598 (2016).
- Ullah, M. B., et al. Polarity control and residual strain in ZnO epilayers grown by molecular beam epitaxy on (0001) GaN/sapphire. physica status solidi (RRL) Rapid Research Letters. 10 (9), 682-686 (2016).
- Ullah, M. B., et al. Characterization of Ag Schottky Barriers on Be0.02Mg0.26ZnO/ZnO Heterostructures. physica status solidi (RRL) - Rapid Research Letters. , (2017).
- Lee, J. H., et al. Schottky diodes prepared with Ag, Au, or Pd contacts on a MgZnO/ZnO heterostructure. Japanese Journal of Applied Physics. 51 (9S2), 09MF07 (2012).
- Singh, R., et al. Investigation of barrier inhomogeneities and interface state density in Au/MgZnO: Ga Schottky contact. Journal of Physics D: Applied Physics. 49 (44), 445303 (2016).
- Brillson, L. J., Lu, Y. ZnO Schottky barriers and Ohmic contacts. Journal of Applied Physics. 109 (12), 121301 (2011).
- Müller, S., et al. Method of choice for fabrication of high-quality ZnO-based Schottky diodes. Journal of Applied Physics. 116 (19), 194506 (1945).
- Figge, S., Böttcher, T., Einfeldt, S., Hommel, D. In situ and ex situ evaluation of the film coalescence for GaN growth on GaN nucleation layers. Journal of Crystal Growth. 221 (1-4), 262-266 (2000).
- Han, J., Ng, T. -. B., Biefeld, R., Crawford, M., Follstaedt, D. The effect of H 2 on morphology evolution during GaN metalorganic chemical vapor deposition. Applied Physics Letters. 71 (21), 3114-3116 (1997).
- Berger, H. Models for contacts to planar devices. Solid-State Electronics. 15 (2), 145-158 (1972).
- Tampo, H., et al. Polarization-induced two-dimensional electron gases in ZnMgO/ZnO heterostructures. Applied Physics Letters. 93 (20), 202104 (2008).
- Ye, J. D., et al. Two-dimensional electron gas in Zn-polar ZnMgO/ZnO heterostructure grown by metal-organic vapor phase epitaxy. Applied Physics Letters. 97 (11), 111908 (2010).
- Šermukšnis, E., et al. Hot-electron energy relaxation time in Ga-doped ZnO films. Journal of Applied Physics. 117 (6), 065704 (2015).
- Singh, C., Agarwal, G., Rao, G. D., Chaudhary, S., Singh, R. Effect of hydrogen peroxide treatment on the electrical characteristics of Au/ZnO epitaxial Schottky diode. Materials Science in Semiconductor Processing. 14 (1), 1-4 (2011).
- Mohanta, S., et al. Electrical characterization of Schottky contacts to n-MgZnO films. Thin Solid Films. 548, 539-545 (2013).
- Schifano, R., Monakhov, E., Grossner, U., Svensson, B. Electrical characteristics of palladium Schottky contacts to hydrogen peroxide treated hydrothermally grown ZnO. Applied Physics Letters. 91 (19), 193507 (2007).
- Ip, K., et al. Improved Pt/Au and W/Pt/Au Schottky contacts on n-type ZnO using ozone cleaning. Applied Physics Letters. 84 (25), 5133-5135 (2004).
- Raju, N. R. C., Kumar, K. J., Subrahmanyam, A. Physical properties of silver oxide thin films by pulsed laser deposition: effect of oxygen pressure during growth. Journal of Physics D: Applied Physics. 42 (13), 135411 (2009).
Reimpresiones y Permisos
Solicitar permiso para reutilizar el texto o las figuras de este JoVE artículos
Solicitar permisoThis article has been published
Video Coming Soon
ACERCA DE JoVE
Copyright © 2025 MyJoVE Corporation. Todos los derechos reservados