Method Article
Herstellung von Schottky-Dioden auf Zn-polar BeMgZnO/ZnO Heterostruktur gewachsen durch Plasmaunterstützte Molekularstrahl-Epitaxie
In diesem Artikel
Zusammenfassung
Erreichung des qualitativ hochwertigen Schottky Kontakte ist zwingende Voraussetzung für effiziente Tor Modulation in Heterostruktur Feldeffekttransistoren (HFETs) zu erreichen. Wir präsentieren die Herstellung Methodik und Merkmale der Schottky-Dioden auf Zn-polar BeMgZnO/ZnO Heterostrukturen mit High-Density-zwei dimensional Electron Gas (2DEG), gewachsen durch Plasmaunterstützte Molekularstrahl-Epitaxie auf GaN Vorlagen.
Zusammenfassung
Heterostruktur Feldeffekttransistoren (HFETs) unter Verwendung einer zwei dimensional Electron gasweg (2DEG) haben ein großes Potenzial für Anwendungen der high-Speed-Geräte. Zinkoxid (ZnO), hat ein Halbleiter mit einer großen Bandlücke (3,4 eV) und hohe Elektron Sättigung Geschwindigkeit als ein attraktiver Werkstoff für high-Speed-Geräte viel Aufmerksamkeit gewonnen. Effiziente Tor Modulation, erfordert jedoch qualitativ hochwertige Schottky Kontakte auf der Sperrschicht. In diesem Artikel präsentieren wir Ihnen unsere Schottky Diode Herstellung Verfahren auf Zn-polar BeMgZnO/ZnO Heterostruktur mit hoher Dichte 2DEG, die durch Belastung Modulation und Einbeziehung von wenigen Prozent erreicht ist werden in der MgZnO-basierte Barriere während des Wachstums durch Molekularstrahl-Epitaxie (MBE). Für die Erreichung hohen kristallinen Qualität sind fast Gitter abgestimmt hohe Widerstandsfähigkeit GaN Vorlagen von Metall-organischen chemischen Aufdampfen (MOCVD) angebaut als Substrat für die anschließende MBE Wachstum der Oxidschichten verwendet. Zu den erforderlichen Zn-Polarität, sorgfältige Oberflächenbehandlung von GaN werden Vorlagen und Kontrolle über das Verhältnis von VI/II während des Wachstums der niedrigen Temperatur ZnO Keimbildung Schicht verwendet. Ti/Au Elektroden dienen als ohmsche Kontakte und Ag-Elektroden auf der O2 Plasma vorbehandelten BeMgZnO Oberfläche dienen zur Schottky Kontakte hinterlegt.
Einleitung
Heterostruktur Feldeffekttransistoren (HFETs) basierend auf zwei dimensional Electron Gas (2DEG) haben ein vielversprechendes Potenzial für Anwendungen in hoher Geschwindigkeit elektronischer Geräte1,2,3. Zinkoxid (ZnO) als große Bandlücke (3,4 eV) Halbleiter mit hoher Elektron Sättigung Geschwindigkeit hat beträchtliche Aufmerksamkeit als Plattform für HFETs4,5gewonnen. Herkömmlich verwendete Barriere materiellen MgZnO ternäre erfordern einen sehr hohen Mg-Gehalt (> 40 %) gewachsen, bei niedrigen Substrat Temperaturen (300 ° C oder niedriger)6,7, und als solche diese Strukturen sind unter high-Power-Betrieb beeinträchtigen apt und während der thermischen Behandlungen, auch wenn die unerwünschte Ladungsdichte in der Barriere ist niedrig genug für Tor-Modulation. Um dieses Hindernis zu umgehen, haben wir vorgeschlagen und angenommen BeMgZnO als Schranke, in dem die Stamm-Zeichen in die Barriere von Druckfestigkeit, Zugfestigkeit über die Einbeziehung von Beryllium (Be), geschalten werden können machen die spontane und Piezoelectricpolarizations werden additive. Infolgedessen kann hohe 2DEG Konzentration mit relativ moderaten Mg Inhalt erreicht werden. Unter Verwendung dieser Ansatz, hohe 2DEG dichten wird beobachtet, in der Nähe der Plasmon-LO Phonon Resonanz (~ 7 × 1012 cm-2) in BeMgZnO/ZnO Heterostrukturen während des Mg Inhalt unten beträgt 30 % und die sein Inhalt ist nur bei 2 ~ 3 %8.
Aufgrund seiner ähnlichen Kristall Symmetrie, UV und sichtbaren leichten Transparenz ist robusten physikalischen und chemischen Eigenschaften und low-cost, c-Ebene Saphir weit verbreitet für Epitaxie von GaN und ZnO eingesetzt. Dank der bemerkenswerten Fortschritte bei den Wachstum Technologie von GaN-basierten elektronischen und optoelektronischen Geräten Saphhire können hochwertige GaN Vorlagen leicht auf Saphir-Substraten hergestellt werden mithilfe von AlN oder Niedertemperatur-(LT) GaN Puffer, trotz seine große Gitterfehlanpassung von 16 % mit Saphir9. Epitaktische Wachstum von ZnO, hat eine noch größere in der Ebene Gitterfehlanpassung von 18 % mit Saphir und ist relativ gut für O-polar Vielzahl verstanden, während das Wachstum der Zn-polar Material im zweidimensionalen Modus nicht etabliert ist. Aufgrund der moderaten Gitterfehlanpassung von 1,8 % ist Epitaxie von ZnO auf GaN eine attraktive Alternative.
MOCVD und MBE sind die erfolgreichsten Halbleiter-Ablagerung-Techniken für die Herstellung von hochwertigen dünnen Schichten und Heterostrukturen mit hoher Reproduzierbarkeit. Die wichtigsten MBE weniger populär als MOCVD für Epitaxie von GaN ist deshalb die Kosten und die Unzulänglichkeit für die Massenproduktion. Die Wachstumsrate in GaN von MOCVD kann einige Mikrometer pro Stunde, und Zehntausende von 2 Zoll (50 mm) Durchmesser Wafer oder diejenigen so groß wie 6-8" in einem Lauf9angebaut werden kann. Hier nehmen wir auch MOCVD für das Wachstum von GaN in unserer Studie. Für das Wachstum von ZnO-basierte Heterostrukturen sind jedoch mehr Berichte über die Bildung von 2DEG durch MBE zum jetzigen Zeitpunkt vor der Kommerzialisierung des potenziellen Anwendungen10,11,12realisiert. Vor kurzem haben wir MBE Wachstum von qualitativ hochwertigen ZnO Heterostrukturen mit eine genaue Kontrolle der Oberfläche Polarität auf Ga-polar GaN Vorlagen13entwickelt. Festgestellt wurde, dass mit Zn vorbelichtung Behandlung, ZnO so erwachsen ausgestellten Zn-Polarität Schichten bei Kernhaltige mit niedrigen VI/II-Ratios (< 1,5), während diejenigen mit VI/II Verhältnisse über 1,5 Kernhaltige O-Polarität ausgestellt. Zur Vermeidung von parallelen Durchführung Kanal durch GaN Vorlagen angenommen wir CO2 kompensiert Semi-isolierende GaN MOCVD auf AlN Puffer für das anschließende Wachstum von ZnO-basierte HFET Strukturen unter Niederdruck Bedingungen angebaut.
Vor unserer Arbeit14gab es keine Berichte über die Untersuchung von Schottky-Dioden auf BeMgZnO/ZnO Heterostrukturen. Nur mehrere Studien haben berichtet, auf Schottky Kontakte zu MgZnO15,16, zB. mit einem Idealität Faktor von 2,37, Barriere Höhe 0,73 eV und eine Berichtigung-Verhältnis von nur 103 15. Verschiedene Schottky Metalle für ZnO17verwendet worden, und unter ihnen, Silber (Ag) wurde weithin angenommen, aufgrund einer relativ hohen Schottky Barrier Höhe von 1,11 eV auf Masse ZnO mit Idealität Faktor 1,08 18.
In dieser Arbeit wollen wir qualitativ hochwertige Schottky-Dioden für die Anwendungen in ZnO-basierte High-Speed-HFET Geräte herzustellen. Das folgende Protokoll gilt insbesondere für die Herstellung von Ag/BeMgZnO/ZnO Schottky-Dioden durch Elektronenstrahl-Verdampfung des Ag auf der BeMgZnO/ZnO-Heterostrukturen durch Plasmaunterstützte MBE auf MOCVD hinterlegt GaN Vorlagen angebaut.
Protokoll
1. Wachstum und Vorbereitung von GaN-Vorlage für MBE-Wachstum
- Wachstum von semi-isolierende GaN-Vorlage von MOCVD
- Sicherstellen Sie, dass der Absperrschieber isolieren die Last Schleusenkammer aus dem Reaktor geschlossen ist. Entlüften Sie die Last-Sperre mit N2 auf den atmosphärischen Druck. Öffnen Sie die Last-Sperre der Substrat-Halter herausnehmen.
- Laden Sie das 2-Zoll-Saphire Substrat auf dem Halter und bringen Sie die Halterung wieder in die Last-Sperre. Abpumpen der Load-Lock-Druck bis 2,5 × 10-2 Torr durch eine mechanische Pumpe trocken.
- Entlüften Sie die Last-Sperre mit N2 bis der Druckausgleich mit, dass in den Reaktorraum (15 mm Hg).
- Öffnen Sie Load-Lock Isolierung Tor Ventil und laden Sie den Halter in der Probe Inhaber Versammlung im Reaktor. Schalten Sie den Motor drehen und die Substrat-Halter-Drehzahl von 100 u/min eingestellt. Schließen Sie dann den Schieber.
- Stellen Sie sicher, dass das Kühlwasser läuft, beide H2 NH3 Versorgung ist ausreichend, mass flow Controller (MFC) und Controller (PC) Druckwerte die gleichen wie die Sollwerte sind und der Substrat-Halter drehen.
- Schalten Sie das System Gas aus N-2 , H2. Die in Situ optischen Reflexion Monitor einschalten.
- Das Wachstum durch Starten der Rezept-Datei, die alle einschließlich der Rampen Substrattemperaturen, Gas-Durchfluss und reaktordruck und Schalten von Ventilen Wachstumsparameter preinstalls zu initiieren.
- Ramp-up der reaktordruck zu 30 Torr in 3 min und die Substrattemperatur auf 1055 ° C zu desorbieren verbleibende Verunreinigungen von der Substratoberfläche für 3 min in H2 -Umgebung.
- Rampe hinunter die Substrattemperatur auf 941 ° C für die Keimbildung und das Wachstum der Niedertemperatur-(LT) AlN Pufferschicht.
- Stabilisieren Sie den Fluss Trimethylaluminum (TMAl) als 12 standard Kubikzentimeter pro Minute (Sccm) und Ammoniak (NH3) fließen als 7 Sccm und die Substrattemperatur 3 Minuten lang.
- Das Wachstum der LT-AlN-Schicht durch die Umstellung TMAl von Vent auf die geführte Linie zu initiieren.
- Steuern Sie die Dicke der LT-AlN-Schicht mithilfe eines Custom-Built Reflektivität Messsystems, umfasst eine 637-nm-Laser-Diode, eine p-i-n Si Photodetektor und eine Labview-basierte Software. Bestimmen Sie die Wachstumsrate aus der Zeit der Reflektivität Schwingungen19,20. Verwenden Sie in ausgewählten Beispielen Scan Elektronenmikroskopie und Transmission Electron Microscopy Schnittbilder bestätigen die Richtigkeit der in Situ überwachen.
- Halten das Wachstum für 6 min zu eine Dicke von ~ 20 nm, dann Ramp-up der Substrattemperatur bis 1100 ° C in 3 min ohne Unterbrechung ein Wachstum zu erreichen und weiter das Wachstum der AlN-Schicht mit einer Dicke von 300 nm, da durch die Evolution der Schwingung der in s überwacht ITU optischer Reflexion.
- Schalten Sie TMAl von Lauf nach Vent und an freie Leitung der AlN-Wachstum zu stoppen. Stabilisieren Sie die Trimethylgallium (TMGa) Durchfluss bei 15,5 Sccm, Rampe bis die NH3 Strömung um 7000 Sccm und für 1 min. Rampe den Reaktor Druck auf 76 Torr in 1 min. Rampe bis die Substrattemperatur 1107 ° c in 1 min zu stabilisieren.
- Keimbildung und wachsen eine GaN-Erholung-Schicht mit einer Dicke von ca. 400 nm, während der Überwachung der Entwicklung der Reflektivität. Zunächst weist die Reflektivität einen deutlicher Rückgang bei GaN blasensiedens auf AlN Oberfläche Inseln und dann erholt sich die Intensität auf das ursprüngliche Niveau ein atomar Ebenen Fläche entspricht, wenn die Inseln verschmelzen.
- Ramp-up das Substrat auf 1124 ° C in 2 min. wachsen die Hochtemperatur-Semi-isolierende GaN Schicht mit einer Dicke von ~2.5 mm. stoppen das Wachstum durch TMGa von Lauf nach Vent und dann an freie Leitung.
- Das Substrat auf Raumtemperatur über einen Zeitraum von 40 Minuten abkühlen.
- Rampe hinunter den reaktordruck zu 15 Torr über einen Zeitraum von 1,5 min.
- Entladen Sie das Substrat aus dem Reaktor durch Anschluss an das umgekehrte Verfahren Schritte 1.1.1-1.1.4.
- GaN Vorlage Vorbereitung und laden zum MBE-Reaktor
- Schneiden Sie die 2-Zoll-GaN-Vorlage in 6 gleich große Torte-förmige Stücke mit einer Diamant-Scriber.
- Bereiten Sie Aqua Regia Säurelösung in dem sauren Abzug durch Zugabe von Salpetersäure (Druckaufschluss3, 68,0-70,0 w/w%, 50 mL), Salzsäure (HCl, 36,5-38,0 w/w%, 150 mL) langsam in ein Becherglas Quarz vor.
- Setzen Sie den Becher Aqua Regia auf einer heißen Platte mit einer Temperatur von 220 ° C.
- Nach dem Erscheinen von einem Orange/rote Farbe und Gasblasen eine Kuchen-förmigen GaN Vorlage in der Lösung einweichen und 10 min. lang kochen.
- Spülen Sie die GaN-Vorlage im Fließwasser deionisiertes (DI) für 3 min.
- Genießen Sie die GaN-Vorlage in HCl (36,5-38,0 w/w%):H2O Lösung (1:1) für 3 min, Ga-Oxid zu entfernen.
- Spülen Sie die GaN-Vorlage in VE-Wasser für 5 min laufen.
- Trocknen Sie die Vorlage mit N2 Gas.
- Setzen Sie die gereinigte GaN-Vorlage auf einem Mo-Halter und laden Sie es sofort in MBE Last-Schleusenkammer.
- Starten Sie die Last-Sperre durch eine mechanische trockene Pumpe Abpumpen.
(2) MBE Wachstum von BeMgZnO/ZnO Heterostrukturen
- Vorbereitung der Erguss Zellen
- Nach dem Abpumpen der Last-Sperre für 1 h, beginnen die Vorbereitung der Zn, Mg, Erguss Zellen. Stellen Sie die obere Zone Temperatur der Doppel-Zone Zn Zelle bis 525 ° C mit einer Rampen von 17 ° C/min, 5 min dann Rampe bis zu 515 ° C mit einer Rampen Rate von 5 ° C/min. Set Mg Zellentemperatur bis 570 ° C mit einer Rampen Rate von 15 ° C/min warten , nach Erreichen des Sollwerts, 10 min. warten dann Rampe die Mg-Zelle bis zu 300 ° C. Legen Sie die Zellentemperatur bis 900 ° C mit einer Rampen Rate von 10 ° C/min, nach Erreichen des Sollwerts, 3 min. warten dann Rampe von der Zelle bis zu 650 ° C.
- Stellen Sie nach 30 min die niedrigere Temperatur der Doppel-Zone Zn Zelle auf 360 ° C mit einer Rampen Rate von 10 ° C/min ein
- Schalten Sie nach Abpumpen die Last-Sperre für 2 h zu einen Druck von ca. 5 × 10-7 Torr zu erreichen die Reflexion hochenergetischen Elektronen Beugung (RHEED) System und laden Sie die GaN-Vorlage in die MBE-Kammer.
- Stimmen Sie den Winkel der GaN-Vorlage durch Drehen des Manipulators um die RHEED Muster Evolution [1-100] azimutaler Richtung zu überwachen.
- Die niedrigere Temperatur der Doppel-Zone Zn Zelle auf 355 ° C mit einer Rampen Rate von 10 ° C/min eingestellt.
- Polarität Kontrolle von ZnO auf GaN und Wachstum der LT-ZnO-Puffer
- Ramp-up der Substrattemperatur 615 ° c mit einer Rampen Rate von 13,6 ° C/min auf die restlichen Verschmutzungen von der Substratoberfläche für 15 min desorbieren.
- Rampe hinunter die Substrattemperatur von 615 bis 280 ° C mit einer Rampen von 13,6 ° C/min für das Wachstum der LT-ZnO. Wenn die Temperatur 550 ° C erreicht, öffnen Sie den Zn Zelle Auslöser, um die GaN-Vorlage-Oberfläche mit Zn Flussmittel aussetzen. O2 Plasma Netzteil schalten Sie ein, legen Sie die Macht als 100 W und überprüfen um sicherzustellen, dass O2 Gasleitung geschlossen ist.
- Wenn die Temperatur 280 ° C erreicht, legen Sie die O2 Plasma macht bis 400 W, Set O2 Durchfluss zu 0,3 Sccm zu zünden des Plasmas dann die Durchflussmenge O2 0,25 Sccm zu verringern.
- 1 min warten Sie, dann öffnen Sie den O2 Auslöser, um das Wachstum der LT-ZnO Pufferschicht beginnen.
- Eine RHEED Muster alle 5 min aufnehmen. Nach einem Wachstum für etwa 15 min entspricht einer Puffer-Dicke von ~ 20 nm, wechselt das RHEED-Muster aus Streifen (2D-Modus) zu elliptischen Flecken (3D-Modus), in der Nähe Zn und O2 Fensterläden, das Wachstum zu stoppen.
- Den O2 -Durchfluss auf 0,4 Sccm, und eingestellt der Substrattemperatur bis 730 ° C mit einer Rampen Rate von 13,6 ° C/min auf die LT-ZnO-Pufferschicht Tempern. Legen Sie die niedrigere Temperatur der Doppel-Zone Zn Zelle bis 345 ° C mit einer Rampen Rate von 10 ° C/min für das Wachstum der HT-ZnO-Schicht.
- Wenn die Substrattemperatur den Sollwert von 730 ° C erreicht, 5 min warten Sie und überprüfen Sie die ZnO-Oberfläche von RHEED. Wenn das RHEED-Muster von 3D auf 2D Transite, stoppen Sie Glühen durch Herunterfahren der Substrattemperatur bis 700 ° C.
- Wachstum der Hochtemperatur-ZnO-Schicht
- Wenn die Substrattemperatur 700 ° C erreicht und stabilisiert, die Durchflussmenge O2 3.2 Sccm zu erhöhen.
- Zn und O2 Rollläden gleichzeitig öffnen Sie zunächst das Wachstum der HT-ZnO-Schicht.
- Wachsen die HT-ZnO-Schicht für ca. 140 min, erreichen eine Stärke von ~ 300 nm. Notieren Sie die RHEED Muster mehrmals während des Wachstums, der 2D Wachstums-Modus zu bestätigen.
- Stoppen Sie das Wachstum von HT-ZnO-Schicht durch Zn und O2 Rollläden gleichzeitig schließen.
- Wachstum der BeMgZnO Barriere
- Der O2 -Volumenstrom bis 0.3 Sccm eingestellt, die Zellentemperatur 820 ° c mit einer Rampen Rate von 10 ° C/min sein, die Zellentemperatur Mg auf 510 ° C mit einer Rampen Rate von 15 ° C/min, und eingestellt der Substrattemperatur bis 325 ° C mit einer Rampen Rate von 13,6 ° C/min für das Wachstum der BeMgZnO Barriere.
- Wenn die Substrattemperatur stabilisiert, erhöhen die Durchflussmenge O2 1,25 Sccm und starten Sie das Wachstum durch gleichzeitige Eröffnung Zn, Mg, sein, und O2 Fensterläden.
- Wachsen die BeMgZnO Sperrschicht für ~ 12 min zu einer Dicke von ca. 30 nm. Rekord RHEED Muster mehrmals während des Wachstums, die Wachstum Modus Entwicklung überwachen.
- Stoppen das Wachstum der BeMgZnO Schicht durch die Schließung der Mg und Auslöser werden, unter Beibehaltung der Zn und O2 Auslöser für 1 min, eine ~ 2 nm dicken ZnO GAP Schicht haben geöffnet.
- Beenden Sie das Wachstum von Zn und O2 Fensterläden schließen.
- Rampe hinunter die Substrattemperatur, seine Bereitschafts-Temperatur 150 ° C. Die Durchflussmenge O2 0,25 Sccm zu verringern.
- Wenn die Substrattemperatur unter 250 ° C liegt, verringern die O2 plasmaleistung bis 100 W, O2 Plasma Stromversorgung ausschalten verringern die Durchflussmenge O2 0, in der Nähe der O2 -Gasleitung und Abkühlen Zelltemperaturen auf standby Bedingungen.
- Warten Sie, bis die Substrattemperatur Bereitschafts-Temperatur 150 ° C zu erreichen, den Wachstum Kammer Schieber öffnen und entladen die Wafer-Halterung an der Last-Schleusenkammer.
- Entlüften der Last Schleusenkammer mit N2 Gas und Herausnehmen der Probenmaterials.
(3) Charakterisierungen
- Messen Sie die Dicke der Probe etwa mit einem Schritt-Profiler, durch die überdachte Fläche am Rand der Probe.
- Bewerten Sie die Dicke, Dehnung und strukturelle Qualität der Heterostruktur mit hoher Auflösung x-ray Diffraction (HRXRD) (Scans 2q-w (0002) Reflexion).
- Schneiden Sie die Probe in 5 × 5 mm2 quadratisches Stück mit einer Diamant-Körner. Untersuchen Sie die elektronischen Eigenschaften der Probe mittels Temperaturmessungen von Hall-Effekt in der van-der-Pauw-Geometrie mit Indium (In) Punkte als kontaktelektroden.
- Überprüfen Sie die Oberflächenmorphologie mittels Rasterkraftmikroskopie (AFM).
4. Herstellung von Schottky-Dioden
- Herstellung von ohmschen Kontakten auf BeMgZnO/ZnO Heterostrukturen
- Entfetten Sie die Probe (~ 20 × 20 mm2 in der Größe) mit Aceton in einem Ultraschallreiniger für 5 min, gefolgt von Reinigung mit Methanol im Ultraschallreiniger für 5 min, in VE-Wasser für 5 min spülen und trocken mit N2weht.
- Spin-Mantel von Fotolack mit 1000 u/min für 3 s und dann 3000 u/min für 30 s.
- Weiche Backen den Fotolack bei 100 ° C für 140 s.
- Expose mit UV-Licht durch den ohmschen Kontakt Maske bei 6,5 mW UV Lampenleistung 2,38 min auf Photolithographie Mask Aligner.
- Post Backen den Fotolack bei 110 ° C für 80 s.
- Entwickeln Sie einen Entwickler für 60 s mit einer zitternden Frequenz von 1/s.
- Spülen Sie mit VE-Wasser für 3 min und fönen mit N2.
- Laden Sie die Probe in den Elektronen-Strahl-Verdampfer.
- Ohne Heizung der Probenmaterials, einzahlen Ti/Au mit einer Dicke von 30/50 nm, Quarzkristall Dicke Monitor gemessen.
- Lift-Off in Aceton, gefolgt von Reinigung in Methanol für 5 min Trocknen spülen in VE-Wasser für 5 min und weht mit N2.
- Tempern den Kontakt durch schnelle thermische glühe (RTA) bei 300 ° C für 30 s.
- Kontaktwiderstand durch Übergang Line Modell (TLM) Messung21zu überprüfen.
- Herstellung von Schottky Kontakte auf BeMgZnO/ZnO Heterostrukturen
- Befolgen Sie die Schritte 4.1.1-4.1.7 für Photolithographie von Schottky-Kontakt.
- Behandeln Sie die Oberfläche der Probe mit remote O2 Plasma für 5 min mit einem O2 Strom von 35 Sccm und eine HF-Leistung von 50 w.
- Befolgen Sie Schritte 4.1.8-4.1.10 für die Abscheidung von Ag mit einer Dicke von 50 nm.
- Charakterisieren Sie die erhaltene Struktur durch spannungs-Messungen für die Schottky-Dioden-17.
Ergebnisse
Die linke Spalte der Abbildung 1 zeigt die Entwicklung der RHEED Muster aufgezeichnet [1-100] azimutaler Richtung während MBE Wachstums der einen werden0,02Mg0,26ZnO/ZnO Heterostruktur mit einer 300 nm dicken HT-ZnO-Schicht und einer 30 nm dick werden0,02 Mg0,26ZnO Barriere. Die Rechte Spalte zeigt repräsentative Oberfläche Morphologien in verschiedenen Wachstumsstadien (nicht aus der gleichen Probe). Wie das Aussehen von einem fleckigen RHEED-Muster zeigt, ist die LT-ZnO-Pufferschicht dreidimensionale (3D) Insel Wachstum Modus Natur. Seine Oberfläche Morphologie wurde verbessert durch Glühen Wärmebehandlung bei Temperaturen über 700 ° C. Es ist klar ersichtlich, dass die Oberfläche von 3D auf 2D Morphologie verwandelt. Die nachfolgende HT-ZnO-Schicht wächst weiter im 2D-Modus, gefolgt von der 2D Wachstum von0,02Mg0,26ZnO Schicht ohne die Bildung einer zweiten Phase werden. AFM-Messungen haben gezeigt, dass die GaN-Vorlage eine Root-Mean-Square (RMS) Rauheit von 0,28 nm für 5 × 5 μm2 Scan. Eine glatte Oberfläche mit einer RMS-Rauheit der 0,35 nm für die HT-ZnO-Schicht ohne Barriere erhalten ist, durch den Anbau unter O-reiche Bedingung und eine RMS-Rauheit von 0,45 nm nach dem Wachstum der BeMgZnO Barriere beobachtet wird.
HRXRD Triple-Achs 2θ-ω Scannen für eine typische Zn-polar sein0,02Mg0,26ZnO/ZnO Heterostruktur mit einer 300 nm dicken HT-ZnO-Schicht und einer 50 nm Dicke0,02Mg0,26ZnO Sperrschicht ist in Abbildung 2gezeigt werden. Die Reflexionen an 34.46 o, 34.54 ound 34.75 o entsprechen (0002) Reflexionen von ZnO, GaN, und0,02Mg0,26ZnO, bzw. werden. Beachten Sie, dass die Ausweitung der Reflexion von0,02Mg0,26ZnO werden aufgrund ihrer Schlankheit. Die biaxiale Zugbelastung in der ZnO-Schicht ist ein Hinweis auf die Zn-polar Heterostruktur, als in unserer vorherigen Studie13untersucht. Und Mg Inhalt im BeMgZnO Quartär waren berechnet aus der Bragg-Winkel der seine XRD (0002) Reflexion und Emission Photonen-Energie in LT-Photolumineszenz (LT-PL) Spektrum gemessen bei 13 K (nicht dargestellt).
Abbildung 3 zeigt die Ergebnisse der temperaturabhängigen Halleffekt Messungen für eine0,02Mg0,26ZnO/ZnO Heterostruktur sein. Die Blatt-Träger-Konzentration verringert von 8.8 × 1012 cm-2 bis 6,4 × 1012 cm-2 wenn die Probe von der Raumtemperatur (293 K) etwa 100 k. abgekühlt war Mit weiterer Abkühlung auf 13 K, sättigt die Blatt-Träger-Konzentration bei 6.2 × 1012 cm-2. Dieses Ergebnis zeigt, dass der beobachtete Rückgang der Elektron-Konzentration aus den Beiträgen von parallelen Durchführung Kanäle entstanden ist die defekte Keimbildung und HT-ZnO-Schicht enthalten sowie die werden0,02Mg0,26ZnO Barriere, wenn überhaupt. Dieser Trend wurde auch für MgZnO/ZnO Heterostrukturen10,22berichtet. Die Elektron-Mobilität in den werden0,02Mg0,26ZnO/ZnO Heterostruktur monoton steigt mit abnehmender Temperatur; sowohl die 293 K Mobilität von 206 cm2/Vs und 13 K von 1550 cm2/Vs sind vergleichbar mit den Werten in der Literatur22,23. Die Entwicklung der elektronischen Eigenschaften als Funktion der Temperatur zeigt eindeutig das Vorhandensein von 2DEG an die0,02Mg0,26ZnO/ZnO Heterointerface werden.
Abbildung 4 zeigt die Strom-Spannung (-V) Kurven gemessen bei Raumtemperatur für vier Vertreter Ag / Be0,02Mg0,26ZnO/ZnO Schottky-Dioden mit einer Schottky-Fläche von 1,1 × 10-4 cm2 in einem Wafer. Die vorderen Ströme exponentiell mit Spannung bis zu 0,25 V, jenseits, den derer die Spannungsabfälle über den Vorwiderstand bemerkbar. Die höchste Höhe der Schottky-Barriere des Φap von 1,07 eV mit einem Idealität Faktor n von 1,22 erreicht wurde. Berichtigung-Verhältnis von etwa 1 × 108 werden erreicht, indem die aktuellen Messwerte bei V= ±2 V.
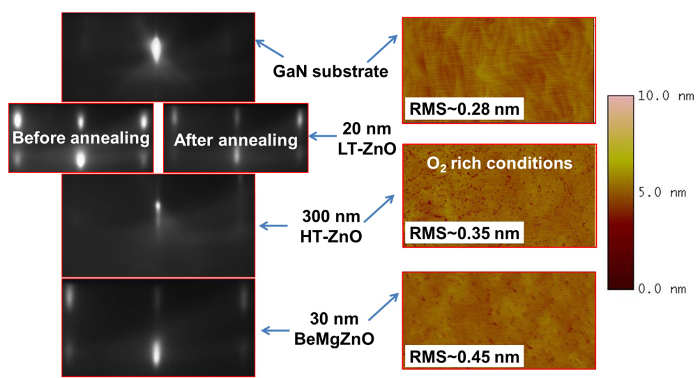
Abbildung 1: Charakterisierung der Oberfläche. Linke Spalte zeigt die RHEED Muster mitgenommen [1-100] azimutaler Richtung während des MBE Wachstums von einem0,02Mg0,26ZnO/ZnO Heterostruktur, und Rechte Spalte zeigt die Oberfläche Morphologien der GaN Vorlage, HT-ZnO-Schicht, und 0,02Mg0,26ZnO Schicht gemessen von AFM. LT-ZnO-Puffer-Technologie ermöglicht das 2D-Modus Wachstum von qualitativ hochwertigen ZnO Heterostrukturen auf niedrigen Gitter nicht übereinstimmende GaN Vorlagen. Bitte klicken Sie hier für eine größere Version dieser Figur.
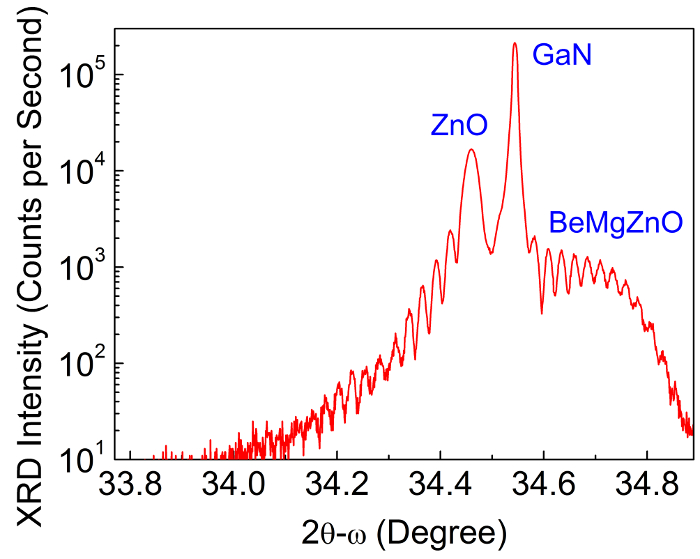
Abbildung 2: HRXRD von der Heterostruktur. HRXRD Triple-Achs 2θ-ω Scannen von einem typischen Zn-polar sein0,02Mg0,26ZnO/ZnO Heterostruktur mit einem 50 nm dick werden0,02Mg0,26ZnO Sperrschicht. Die Reflexionen an 34.46 o, 34.54 ound 34.75 o entsprechen (0002) Reflexionen von ZnO, GaN, und0,02Mg0,26ZnO, bzw. werden. Bitte klicken Sie hier für eine größere Version dieser Figur.
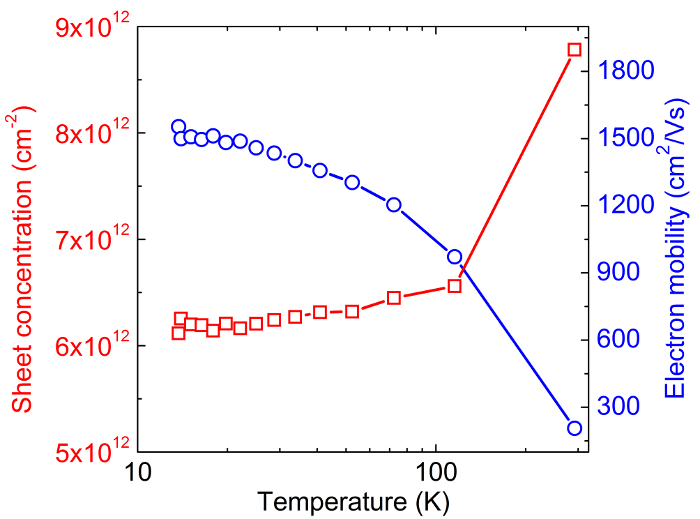
Abbildung 3. Elektronische Eigenschaften von der Heterostruktur. Temperatur Abhängigkeiten Blatt Träger Dichte und Elektron Mobilität von Zn-polar0,02Mg0,26ZnO/ZnO Heterostruktur sein. Bitte klicken Sie hier für eine größere Version dieser Figur.

Abbildung 4. Schottky-Dioden. Typisch -V Eigenschaften der vier Vertreter Ag /0,02Mg0,26ZnO/ZnO Schottky-Dioden bei Raumtemperatur gemessen werden. Die Ähnlichkeit der vier-Spannungs-Kurven zeigt die hohe in Wafer-Einheitlichkeit der Probe. Bitte klicken Sie hier für eine größere Version dieser Figur.
Diskussion
Einbeziehung der BeO in MgZnO bilden die quartären BeMgZnO bietet die Möglichkeit das Ausmaß und die Zeichen der Dehnung des Quartärs tune und somit signifikant erhöht die 2DEG Dichte8. Die repräsentativen Ergebnisse zeigen, dass die werden0,02Mg0,26ZnO/ZnO Heterostruktur Ergebnisse in 2DEG Dichte in der Nähe der gewünschten Plasmon-LO Phonon Resonanz Elektron Dichte (~ 7 × 1012 cm-2)24. Obwohl die Elektron-Mobilität von der Heterostruktur stark abhängig von der MBE Wachstumsparameter wie die Substrattemperatur und VI/II Verhältnis von HT-ZnO und BeMgZnO-Sperrschicht, die 2DEG Dichte ist schwach abhängig von den Wachstumsbedingungen und maßgeblich durch das werden und Mg-Gehalt in der Barriere.
Eine GaN-Vorlage ist für das Wachstum der BeMgZnO/ZnO Heterostrukturen mit hoher kristalliner Qualität aufgrund der moderaten Gitterfehlanpassung von 1,8 % zwischen GaN und ZnO, verglichen mit einem großen Gitterfehlanpassung von 18 % zwischen Saphir und ZnO verwendet. Um alle leitfähigen parallele Kanäle zu vermeiden, ist es wichtig, eine hohe Beständigkeit im Bereich MΩ/Platz für die GaN-Vorlage haben. In unserem Fall ist dies durch den Anbau mit einem niedrigen Kammerdruck von 76 Torr, CO2 Kompensation zu verbessern. Um die Polarität-Kontrolle in der BeMgZnO/ZnO-Heterostrukturen (Zn-Polarität) zu gewährleisten, ist die sorgfältige Oberflächenbehandlung von GaN Vorlage unverzichtbar. Oxidation oder Verschmutzung während der Vorbereitung auf der GaN-Oberfläche eingeführt würde Zn - und O-Mix-Polarität in Modellsystemen die Determinante VI/II-Verhältnis zu induzieren < 1,5 erfüllt.
Jede chemische Reaktion zwischen Metall und Halbleiter, das Vorhandensein von Oberflächenverunreinigungen, heißt es, Mängel in der Nähe der Oberfläche und der Diffusion von Metall in den Halbleiter sind häufige Probleme im Bereich der Herstellung von Schottky Kontakte. Eine Vielzahl von Methoden wurde in der Literatur für die Vorbereitung der Oberfläche des ZnO Schottky Kontakt Herstellung berichtet. Dazu gehören Radierung in HCl (oder andere Säuren), physikalischen Ätzen mit Ar+, UV-Ozon-Reinigung, Behandlung in H2O2und O2 Plasma (oder Mischung mit er)25,26,27, 28. Radierung Verfahren Ziel für die Entfernung von einer Oberflächenschicht mit Dicke eine reicht von wenigen Nanometern bis Mikron und daher nicht für HFET Geräte angewendet werden. Die UV-Ozon Reinigung oder O2 Plasma Verfahren entfernt nur die Oberflächenschicht. Es eignet sich daher gut für die Oberflächenvorbereitung von unseren BeMgZnO/ZnO-Heterostrukturen.
In der Regel werden Schottky Kontakte durch Hinterlegung einer hohen Austrittsarbeit Metalls wie Pd, Pt, Irerreicht. Im Gegensatz dazu hat die Ag eine geringe Austrittsarbeit 4,26 eV. Trotzdem können Geräte mit Ag-Elektrode gleichrichtende Verhalten wegen der Bildung einer Schnittstelle Silber-oxid-Schicht verursacht durch partielle Oxidation von Ag mit Sauerstoff von ZnO-Matrix angezeigt. Die so gebildete Oxidschicht ist transparent für Elektronen und höheren Austrittsarbeit hat im Vergleich zur Ag. Raju Et Al. haben Arbeitsfunktionen rund 5,5 eV für AgO gewachsen durch gepulste Laser Deposition (PLD), die 1,3 eV höher als die der Ag und in der Nähe das Merkmal der Pd, Pt und IR-29gemeldet. Unsere Ergebnisse zeigen, dass die Ag-Elektrode (mit O2 Plasma-Vorbehandlung auf der Oberfläche von ZnO Heterostruktur) einen vielversprechenden Kontakt Metall für die Bildung von Schottky-Dioden.
Wir haben eine Methode für die Herstellung von hochwertigen Schottky Kontakte für ZnO-basierte HFETs bewiesen. MOCVD gewachsen GaN Vorlage mit sorgfältiger Oberflächenvorbereitung vor dem MBE Wachstum und ein niedriges Verhältnis von VI/II < 1,5 während ZnO Keimbildung die Zn-polare Ausrichtung der ZnO-basierte Heterostrukturen mit hoher Qualität zu gewährleisten. MOCVD ist eine weit verbreitete ausgereifte Technik für Epitaxie von GaN für verschiedene Anwendungen. In dieser Arbeit beschriebene MBE-Verfahren zeigt die Kombinierbarkeit von MOCVD und MBE Techniken und GaN und oxid-Halbleiter für elektronische Geräte. Gründung einer kleinen Menge von werden in die BeMgZnO Barrier Layer Ergebnisse in HFETs mit hohen 2DEG Dichte, hohe Elektron Mobilität und hohe thermische Stabilität, für high-Speed-Performance verbessert.
Offenlegungen
Die Autoren haben nichts preisgeben.
Danksagungen
Diese Arbeit wurde vom Air Force Büro der wissenschaftlichen Forschung (AFOSR) unter Grant FA9550-12-1-0094 unterstützt.
Materialien
| Name | Company | Catalog Number | Comments |
| MOCVD | Emcore | custom-built | |
| MBE | SVT Associates | ||
| TMAl | SAFC | CAS: 75-24-1 | |
| TMGa | SAFC | CAS: 1445-79-0 | |
| NH3 | The Linde group | CAS: 7664-41-7 | |
| H2 | National Welders Supply Co. | supplier part no. 335-041 | Grade 5.0 |
| O2 | National Welders Supply Co. | supplier part no. OX 300 | Industrial Grade Oxygen, Size 300 Cylinder, CGA-540 |
| Mg | Sigma-Aldrich | Product No.: 474754-25G | MAGNESIUM, DISTILLED, DENDRITIC PIECES, 99.998% METALS BASIS |
| Be | ESPI Metals | Stock No. K646b | Beryllium pieces, 3N |
| Zn | Alfa Aesar, Thermo Fisher Scientific Chemicals Inc. | Product No.: 10760-30 | Zinc shot, 1-6mm (0.04-0.24in), Puratronic, 99.9999% |
| Au | Kurt J. Lesker | part no. EVMAUXX40G | Gold Pellets, 99.99% |
| Ag | Kurt J. Lesker | part no. EVMAG40QXQ | Silver Pellets, 99.99% |
| Ti | Kurt J. Lesker | part no. EVMTI45QXQ | Titanium Pellets, 99.995% |
| Developer | Rohm and Haas electronic Materials LLC | MF-CD-26 | Material number 10018050 |
| Photoresist | Rohm and Haas electronic Materials LLC | SPR 955 | Material number 10018283 |
Referenzen
- Morkoc, H., Solomon, P. M. The hemt: A superfast transistor: An experimental GaAs-AlGoAs device switches in picoseconds and generates little heat. This is just what supercomputers need. IEEE spectrum. 21 (2), 28-35 (1984).
- Aktas, O., et al. Microwave performance of AlGaN/GaN inverted MODFET's. IEEE Electron Device Letters. 18 (6), 293-295 (1997).
- Leach, J. H., et al. Effect of hot phonon lifetime on electron velocity in InAlN/AlN/GaN heterostructure field effect transistors on bulk GaN substrates. Applied Physics Letters. 96 (13), 133505 (2010).
- Sasa, S., et al. Microwave performance of ZnO/ZnMgO heterostructure field effect transistors. Physica status solidi (a). 208 (2), 449-452 (2011).
- Ye, D., et al. Enhancement-mode ZnO/Mg0.5Zn0.5O HFET on Si. Journal of Physics D: Applied Physics. 47 (25), 255101 (2014).
- Koike, K., et al. Molecular beam epitaxial growth of wide bandgap ZnMgO alloy films on (111)-oriented Si substrate toward UV-detector applications. Journal of Crystal Growth. 278 (1-4), 288-292 (2005).
- Du, X., et al. Controlled Growth of High-Quality ZnO-Based Films and Fabrication of Visible-Blind and Solar-Blind Ultra-Violet Detectors. Advanced Materials. 21 (45), 4625-4630 (2009).
- Ding, K., Ullah, M., Avrutin, V., Özgür, &. #. 2. 2. 0. ;., Morkoç, H. Investigation of high density two-dimensional electron gas in Zn-polar BeMgZnO/ZnO heterostructures. Applied Physics Letters. 111 (18), 182101 (2017).
- Ding, K., Avrutin, V., Özgür, &. #. 2. 2. 0. ;., Morkoç, H. III-Nitride Light-Emitting Diodes. Wiley Encyclopedia of Electrical and Electronics Engineering. , 1-21 (2017).
- Tsukazaki, A., et al. Quantum Hall effect in polar oxide heterostructures. Science. 315 (5817), 1388-1391 (2007).
- Tsukazaki, A., et al. Observation of the fractional quantum Hall effect in an oxide. Nat Mater. 9 (11), 889-893 (2010).
- Falson, J., et al. MgZnO/ZnO heterostructures with electron mobility exceeding 1 x 10(6) cm(2)/Vs. Sci Rep. 6, 26598 (2016).
- Ullah, M. B., et al. Polarity control and residual strain in ZnO epilayers grown by molecular beam epitaxy on (0001) GaN/sapphire. physica status solidi (RRL) Rapid Research Letters. 10 (9), 682-686 (2016).
- Ullah, M. B., et al. Characterization of Ag Schottky Barriers on Be0.02Mg0.26ZnO/ZnO Heterostructures. physica status solidi (RRL) - Rapid Research Letters. , (2017).
- Lee, J. H., et al. Schottky diodes prepared with Ag, Au, or Pd contacts on a MgZnO/ZnO heterostructure. Japanese Journal of Applied Physics. 51 (9S2), 09MF07 (2012).
- Singh, R., et al. Investigation of barrier inhomogeneities and interface state density in Au/MgZnO: Ga Schottky contact. Journal of Physics D: Applied Physics. 49 (44), 445303 (2016).
- Brillson, L. J., Lu, Y. ZnO Schottky barriers and Ohmic contacts. Journal of Applied Physics. 109 (12), 121301 (2011).
- Müller, S., et al. Method of choice for fabrication of high-quality ZnO-based Schottky diodes. Journal of Applied Physics. 116 (19), 194506 (1945).
- Figge, S., Böttcher, T., Einfeldt, S., Hommel, D. In situ and ex situ evaluation of the film coalescence for GaN growth on GaN nucleation layers. Journal of Crystal Growth. 221 (1-4), 262-266 (2000).
- Han, J., Ng, T. -. B., Biefeld, R., Crawford, M., Follstaedt, D. The effect of H 2 on morphology evolution during GaN metalorganic chemical vapor deposition. Applied Physics Letters. 71 (21), 3114-3116 (1997).
- Berger, H. Models for contacts to planar devices. Solid-State Electronics. 15 (2), 145-158 (1972).
- Tampo, H., et al. Polarization-induced two-dimensional electron gases in ZnMgO/ZnO heterostructures. Applied Physics Letters. 93 (20), 202104 (2008).
- Ye, J. D., et al. Two-dimensional electron gas in Zn-polar ZnMgO/ZnO heterostructure grown by metal-organic vapor phase epitaxy. Applied Physics Letters. 97 (11), 111908 (2010).
- Šermukšnis, E., et al. Hot-electron energy relaxation time in Ga-doped ZnO films. Journal of Applied Physics. 117 (6), 065704 (2015).
- Singh, C., Agarwal, G., Rao, G. D., Chaudhary, S., Singh, R. Effect of hydrogen peroxide treatment on the electrical characteristics of Au/ZnO epitaxial Schottky diode. Materials Science in Semiconductor Processing. 14 (1), 1-4 (2011).
- Mohanta, S., et al. Electrical characterization of Schottky contacts to n-MgZnO films. Thin Solid Films. 548, 539-545 (2013).
- Schifano, R., Monakhov, E., Grossner, U., Svensson, B. Electrical characteristics of palladium Schottky contacts to hydrogen peroxide treated hydrothermally grown ZnO. Applied Physics Letters. 91 (19), 193507 (2007).
- Ip, K., et al. Improved Pt/Au and W/Pt/Au Schottky contacts on n-type ZnO using ozone cleaning. Applied Physics Letters. 84 (25), 5133-5135 (2004).
- Raju, N. R. C., Kumar, K. J., Subrahmanyam, A. Physical properties of silver oxide thin films by pulsed laser deposition: effect of oxygen pressure during growth. Journal of Physics D: Applied Physics. 42 (13), 135411 (2009).
Nachdrucke und Genehmigungen
Genehmigung beantragen, um den Text oder die Abbildungen dieses JoVE-Artikels zu verwenden
Genehmigung beantragenThis article has been published
Video Coming Soon
Copyright © 2025 MyJoVE Corporation. Alle Rechte vorbehalten