Method Article
Fabricação de diodos de Schottky na Zn-polar BeMgZnO/ZnO Heterostructure cultivadas por Epitaxia de feixe Molecular assistido por Plasma
Neste Artigo
Resumo
Realização de contatos de Schottky de alta qualidade é fundamental para alcançar a modulação eficiente portão em transistores de efeito de campo heterostructure (virais). Apresentamos a metodologia de fabricação e características de diodos de Schottky na BeMgZnO/ZnO Zn-polar estende com gás de elétrons dimensional dois high-density (2DEG), cultivadas por Epitaxia de feixe molecular assistido por plasma em modelos de GaN.
Resumo
Transistores de efeito de campo Heterostructure (virais) utilizando um canal de gás (2DEG) de dois elétrons dimensional têm um grande potencial para aplicativos de dispositivo de alta velocidade. Óxido de zinco (ZnO), um semicondutor com um bandgap largo (3,4 eV) e velocidade de elétrons de alta saturação tem ganhado muita atenção como um material atrativo para dispositivos de alta velocidade. Modulação de portão eficiente, no entanto, requer contatos de Schottky de alta qualidade sobre a camada de barreira. Neste artigo, apresentamos nosso procedimento de fabricação de diodo de Schottky na BeMgZnO/ZnO Zn-polar heterostructure com 2DEG de alta densidade, que é conseguido através de modulação de tensão e a incorporação de alguns por cento ser na barreira baseada em MgZnO durante o crescimento por Epitaxia de feixe molecular (MBE). Para alcançar alta qualidade cristalina, quase retículo-combinadas alta resistividade GaN modelos cultivados pela deposição de vapor químico metal-orgânico (MOCVD) são usados como substrato para o crescimento de MBE subsequente das camadas de óxido. Para obter a necessária Zn-polaridade, tratamento de superfície cuidado de GaN modelos e controle sobre a relação de VI/II durante o crescimento da temperatura baixa camada de nucleação de ZnO são utilizados. Eletrodos de ti/Au servem como contatos ôhmicas e eletrodos de Ag depositados no plasma2 O pré-tratamento de superfície de BeMgZnO são utilizados para contatos de Schottky.
Introdução
Transistores de efeito de campo Heterostructure (virais) com base no gás de elétrons dimensional dois (2DEG) têm um potencial promissor para as aplicações em dispositivos eletrônicos de alta velocidade a1,2,3. Óxido de zinco (ZnO) como um semicondutor bandgap largo (3,4 eV) com velocidade de elétrons de alta saturação ganhou a atenção considerável como uma plataforma para virais4,5. Barreira convencionalmente utilizado material MgZnO ternário exigem um muito elevado teor de Mg (> 40%) cultivado em substrato de baixas temperaturas (300 ° C ou inferior)6,7e como tal estas estruturas estão aptas a degradar sob operações de alta potência e durante tratamentos termais, mesmo se a densidade de carga indesejada na barreira é baixa o suficiente para modulação do portão. Para contornar esse obstáculo, temos proposto e adotado BeMgZnO como a barreira, em que o sinal de tensão na barreira pode ser alternado de compressão para tração através da incorporação de berílio (Be), tornando a espontânea e piezoelectricpolarizations para ser aditivo. Como resultado, 2DEG alta concentração pode ser conseguida com conteúdo relativamente moderado de Mg. Utilizar esta abordagem, 2DEG alta densidades é observado perto da plasmon-LO fônon ressonância (~ 7 × 1012 cm-2) em BeMgZnO/ZnO estende enquanto o teor de Mg abaixo é de 30% e a ser conteúdo está somente em 2 ~ 3%8.
Devido à sua simetria semelhante de cristal, UV e transparência de luz visível, robustas propriedades físicas e químicas e baixo custo, c-plano safira é amplamente empregado por Epitaxia de GaN e ZnO. Graças aos notáveis progressos na tecnologia de crescimento de GaN-based eletrônica e dispositivos optoeletrônicos na saphhire, modelos de GaN de alta qualidade podem ser facilmente produzidos em substratos de safira usando AlN ou tampão de baixa temperatura (LT) GaN, apesar sua incompatibilidade de grande estrutura de 16% com safira9. Crescimento epitaxial de ZnO, que tem uma incompatibilidade no plano da estrutura ainda maior de 18% com safira, é relativamente bem compreendido para O-polar variedade, enquanto o crescimento do Zn-polar material no modo bidimensional não está bem estabelecido. Devido à incompatibilidade de treliça moderada de 1,8%, Epitaxia de ZnO na GaN é uma alternativa atraente.
MOCVD e a MBE são as mais bem sucedidas técnicas de deposição de semicondutores para fabricação de filmes finos de alta qualidade e a estende com alta reprodutibilidade. A principal razão que MBE é menos popular do que MOCVD por Epitaxia de GaN é o custo e a inadequação para produção em massa. A taxa de crescimento em GaN por MOCVD pode ser vários micrômetros por hora e dezenas de discos (wafers) diâmetro de 2 polegadas (50 mm) ou aqueles tão grande como a 6-8" podem ser cultivadas em uma execução9. Aqui, também adotamos MOCVD para o crescimento de GaN em nosso estudo. Para o crescimento de ZnO-baseado estende, no entanto, mais relatórios sobre a formação de 2DEG são realizados por MBE neste momento antes da comercialização dos potenciais aplicações10,11,12. Recentemente, temos desenvolvido crescimento MBE de alta qualidade ZnO estende com um controle preciso da superfície polaridade na Ga-polar GaN modelos13. Verificou-se que, com tratamento pré-exposição de Zn, ZnO camadas tão crescida exposta Zn-polaridade quando nucleated com baixos índices de VI/II (< 1.5), enquanto aqueles nucleated com rácios de VI/II acima 1,5 exibiram O-polaridade. Para evitar o canal paralelo de condução através de modelos de GaN, adotamos carbono compensado semi isolante GaN MOCVD cultivadas sob condições de baixa pressão em AlN buffer para o crescimento subsequente de estruturas baseadas em ZnO HFET.
Antes de nosso trabalho14, não tem havido relatos na investigação de diodos de Schottky na BeMgZnO/ZnO estende. Apenas vários estudos têm relatado na Schottky contatos para MgZnO15,16, por exemplo., com um factor de idealidade de 2,37, a altura de barreira de 0,73 eV e uma relação de retificação de apenas 103 15. Vários metais de Schottky têm sido utilizados para ZnO17, e entre eles, prata (Ag) tem sido amplamente adoptada, devido a uma relativamente alta Schottky barreira altura de 1,11 eV em granel ZnO com um factor de idealidade de 1,08 18.
Neste trabalho, pretendemos fabricar diodos de Schottky de alta qualidade para as aplicações em dispositivos baseados em ZnO HFET de alta velocidade. O seguinte protocolo aplica-se especificamente para a fabricação de diodos de Schottky Ag/BeMgZnO/ZnO por evaporação e-feixe de Ag sobre a BeMgZnO/ZnO estende cultivadas por plasma assistida MBE em modelos GaN MOCVD-depositado.
Protocolo
1. crescimento e preparação de GaN modelo para crescimento de MBE
- Crescimento do modelo de GaN semi isolante por MOCVD
- Certifique-se de que a válvula de portão isolando a câmara de carga-fechamento do reator é fechada. Ventilar a carga-fechamento com N2 a pressão atmosférica. Abra o bloqueio de carga para Retire o suporte do substrato.
- Carregar o substrato safira 2 polegadas no porta e em seguida, coloque o suporte para o bloqueio de carga. Bomba para baixo a pressão de carga-bloqueio até 2,5 × 10-2 Torr, por uma bomba mecânica e seca.
- Ventilar a carga-fechamento com N2 para equalizar sua pressão com que na câmara do reator (15 Torr).
- Abra a válvula de isolamento de carga-fechamento e carregar o titular para o conjunto do suporte de amostra no reator. Ligue o motor de rotação e definir a velocidade de rotação do substrato-titular de 100 rpm. Em seguida, feche a válvula.
- Certifique-se que a água de resfriamento está executando, ambos de H2 NH3 oferta é suficiente, massa fluxo controlador (MFC) e as leituras de pressão controlador (PC) são os mesmos que os setpoints e o titular do substrato estiver girando.
- Aquecer o gás do sistema de N2 H2. Ligue o monitor de reflectância óptica em situ .
- Inicie o crescimento iniciando o arquivo de receita, que pré-instala todos os parâmetros de crescimento, incluindo a subida de temperatura do substrato, taxas de fluxo de gás e pressão do reator e troca de válvulas.
- Rampa até a pressão do reator até 30 Torr em 3 min e a temperatura do substrato para o 1055 ° C desorb contaminações residuais da superfície do substrato por 3 min em ambiente de2 H.
- Rampa para baixo a temperatura do substrato de 941 ° C para a nucleação e o crescimento da camada de buffer de AlN (LT) de baixa temperatura.
- Estabilize o fluxo de trimethylaluminum (TMAl) como 12 centímetro cúbico padrão por minuto (sccm) e amônia (NH3) fluxo como sccm 7 e a temperatura do substrato por 3 min.
- Inicie o crescimento da camada LT-AlN passando TMAl de ventilação para a linha de execução.
- Controle a espessura da camada de LT-AlN usando um sistema de medição de refletividade custom-built, que inclui um díodo laser 637-nm, um p-i-n Si fotodetector e um software baseado em Labview. Determine a taxa de crescimento do período da refletividade oscilações19,20. Em amostras selecionadas, use imagens de microscopia eletrônica de varredura varredura transversais da microscopia eletrônica e transmissão para confirmar a exatidão de em situ monitoramento.
- Manter o crescimento para 6 min chegar a uma espessura de ~ 20 nm, em seguida, rampa até a temperatura do substrato a 1100 ° C em 3 min sem uma interrupção do crescimento e continuar o crescimento da AlN camada com uma espessura de 300 nm, como monitorado pela evolução da oscilação da em s ITU reflectância óptica.
- Interruptor TMAl de executar a ventilação e depois a linha ociosa para parar o crescimento de AlN. Estabilizar o fluxo de trimethylgallium (TMGa), no sccm 15,5, rampa até o fluxo do NH3 7000 sccm e estabilizar por 1 min. rampa acima da pressão de reator para 76 Torr em 1 min. rampa até a temperatura do substrato a 1107 ° C em 1 min.
- Nucleada e crescer uma camada de recuperação GaN com uma espessura de ~ 400 nm, enquanto monitora a evolução de refletividade. Inicialmente a refletividade apresenta uma diminuição abrupta quando GaN ilhas nucleada na superfície de AlN e então recupera a intensidade ao nível original correspondente a uma superfície atomicamente plana quando se aglutinam as ilhas.
- Rampa até o substrato 1124 ° c em 2 min. cresce a camada de GaN semi isolante de alta temperatura com uma espessura de ~2.5 mm. parar o crescimento, passando de TMGa executar a ventilação e depois a linha ociosa.
- Arrefecer o substrato a temperatura ambiente durante um período de 40 min.
- Rampa para baixo a pressão do reator para 15 Torr ao longo de um período de 1,5 min.
- Descarrega o substrato do reator, seguindo o procedimento inverso de passos 1.1.1-1.1.4.
- Preparação do modelo de GaN e carregamento de reator MBE
- Corte o modelo de GaN de 2 polegadas em 6 partes iguais em forma de torta usando um scriber do diamante.
- Prepare água régia solução ácida dentro da coifa ácido adicionando ácido nítrico (HNO3, 70,0 68,0-w/w%, 50 mL) de ácido clorídrico (HCl, 36,5-38.0 w/w%, 150 mL) lentamente para um matraz de quartzo.
- Colocar o copo de água régia em uma chapa quente com uma temperatura de 220 ° C.
- Após o aparecimento de uma cor de laranja/vermelho e bolhas de gás, embeba um modelo em forma de torta de GaN na solução e ferva-a por 10 min.
- Lave o modelo GaN em marcha os água deionizada (DI) por 3 min.
- Mergulhe o modelo GaN em HCl (36,5-38.0 w/w%):H2O solução (1:1) por 3 min remover óxido de Ga.
- Lave o modelo GaN no DI água corrente por 5 min.
- Seque o modelo com gás de2 N.
- Colocar o modelo GaN limpo sobre um suporte de Mo e carregá-lo na câmara de carga-fechamento MBE imediatamente.
- Comece a bombear até o bloqueio de carga por uma bomba mecânica e seca.
2. MBE crescimento de BeMgZnO/ZnO estende
- Preparação das células efusão
- Após o bombeamento para o Bloquear de carga para 1 h, iniciar a preparação do Zn, Mg, ser células de efusão. Definir a temperatura da zona superior da célula de Zn-zona dupla para 525 ° C, com uma taxa de subida de 17 ° C/min, espere 5 min, em seguida, rampa até 515 ° C, com uma taxa de subida de 5 ° C/min. Set a temperatura da célula de Mg a 570 ° C com uma taxa de subida de 15 ° C/min , depois de atingir o set point, esperar por 10 min, em seguida, rampa a célula Mg até 300 ° C. Definir a temperatura da célula 900 ° C, com uma taxa de subida de 10 ° C/min, depois de atingir o set point, esperar 3 min depois rampa a célula até 650 ° C.
- Após 30 min, defina a temperatura de zona inferior da célula Zn Duplo-zona de 360 ° C, com uma taxa de subida de 10 ° C/min.
- Após o bombeamento para o Bloquear de carga para 2h chegar a uma pressão de ~ 5 × 10-7 Torr, ligue o sistema de difração (RHEED) de elétrons de alta energia de reflexão e carregar o modelo de GaN na câmara da MBE.
- Ajuste o ângulo do modelo GaN girando o manipulador para monitorar a evolução do padrão RHEED direção azimutal [1-100].
- Defina a temperatura de zona inferior da célula Zn Duplo-zona 355 ° c, com uma taxa de subida de 10 ° C/min.
- Controle de polaridade de ZnO em GaN e crescimento do buffer LT-ZnO
- Rampa até a temperatura do substrato a 615 ° C, com uma taxa de subida de 13,6 ° C/min para desorb as contaminações residuais da superfície do substrato por 15 min.
- Rampa para baixo a temperatura do substrato de 615 280 ° c, com uma taxa de subida de 13,6 ° C/min para o crescimento da LT-ZnO. Quando a temperatura atinge 550 ° C, abra o obturador de célula Zn para expor a superfície do modelo de GaN com fluxo de Zn. Ligue a fonte de alimentação de plasma O2 , definir o poder como 100 W e dar uma olhada para verificar que a tubulação de gás O2 está fechada.
- Quando a temperatura atinge 280 ° C, como o poder de plasma O2 400 W, taxa de fluxo do conjunto o O2 para 0,3 sccm para inflamar o plasma, em seguida, diminuir a taxa de fluxo de2 O para sccm 0,25.
- Aguarde 1 min e, em seguida, abrir o obturador de2 O para iniciar o crescimento da camada de buffer LT-ZnO.
- Grave um padrão RHEED cada 5 min. Após ter crescido para cerca de 15 min, correspondente a uma espessura de tampão de ~ 20 nm, quando o padrão RHEED muda de listras (modo 2D) para manchas elípticas (modo 3D), fechar ambos Zn e O2 obturadores para parar o crescimento.
- Definir a taxa de fluxo de2 O de 0,4 sccm e regule a temperatura do substrato a 730 ° C, com uma taxa de subida de 13,6 ° C/min para recozer a camada de buffer LT-ZnO. Defina a temperatura mais baixa da zona da célula Zn Duplo-zona de 345 ° C, com uma taxa de subida de 10 ° C/min para o crescimento da camada de ZnO-HT.
- Quando a temperatura do substrato atinge o set-point de 730 ° C, espere 5 min e verifique a superfície de ZnO por RHEED. Quando o padrão RHEED transita de 3D para 2D, para recozimento pela rampa para baixo a temperatura do substrato a 700 ° C.
- Crescimento da camada de ZnO de alta temperatura
- Quando a temperatura do substrato atinge 700 ° C e estabiliza, aumente a taxa de fluxo de2 O para 3.2 sccm.
- Inicie o crescimento da camada de HT-ZnO abrindo tanto Zn e O2 obturadores simultaneamente.
- Crescer a camada de ZnO-HT para ~ 140 min chegar a uma espessura de ~ 300 nm. Grave os padrões RHEED várias vezes durante o crescimento, para confirmar o modo de crescimento 2D.
- Pare o crescimento da camada de HT-ZnO, fechando tanto Zn e O2 obturadores simultaneamente.
- Crescimento da barreira BeMgZnO
- Definir a taxa de fluxo de2 O para 0,3 sccm, definir a temperatura da célula 820 ° c, com uma taxa de subida de 10 ° C/min, regule a temperatura de célula de Mg 510 ° c, com uma taxa de subida de 15 ° C/min e regule a temperatura do substrato a 325 ° C, com uma taxa de subida de 13,6 ° C/min para o crescimento da barreira BeMgZnO.
- Quando a temperatura do substrato se estabiliza, aumentar a taxa de fluxo de2 O para 1,25 sccm, e começar o crescimento simultâneo abrindo o Zn, Mg, ser e O2 obturadores.
- Crescer a BeMgZnO camada de barreira para ~ 12 min chegar a uma espessura de ~ 30 nm. Registro RHEED padrões várias vezes durante o crescimento para monitorar a evolução do modo de crescimento.
- Parar o crescimento da camada BeMgZnO, fechando a Mg e ser o obturador, mantendo o Zn e O2 obturador aberto por 1 min ter uma camada de cap ~ 2 nm grosso ZnO.
- Termine o crescimento fechando ambos Zn e O2 obturadores.
- Rampa para baixo a temperatura do substrato a sua temperatura de standby 150 ° C. Diminua a taxa de fluxo de2 O para 0,25 sccm.
- Quando a temperatura do substrato estiver abaixo de 250 ° C, diminuir o poder de plasma O2 a 100 W, desligue a fonte de alimentação O2 plasma, diminuir a taxa de fluxo O2 a 0, fechar a linha de gás de2 O e arrefecer as temperaturas de célula para standby condições.
- Espere que a temperatura do substrato atingir a temperatura de standby 150 ° C, abra a válvula de câmara de crescimento e descarregar o titular de bolacha para a câmara de carga-bloqueio.
- Ventilação da câmara de carga-fechamento com gás de2 N e tirar a amostra.
3. caracterizações
- Mais ou menos medir a espessura da amostra usando um etapa-profiler, através da área coberta na borda da amostra.
- Avalie a qualidade de espessura, tensão e estrutural da heterostructure usando alta resolução, difração de raios x (HRXRD) (2q-w varreduras de reflexão (0002)).
- Cortar a amostra em 5 × 5 mm2 pedaço quadrado usando um scriber do diamante. Investiga as propriedades eletrônicas da amostra por meio de medidas de efeito Hall temperatura dependentes na geometria de van der Pauw, com índio (In) pontos como eletrodos de contato.
- Verificar a morfologia da superfície usando microscopia de força atômica (AFM).
4. fabricação de diodos de Schottky
- Fabricação de contatos ôhmicas na BeMgZnO/ZnO estende
- Desengordurar a amostra (~ 20 × 20 mm2 no tamanho) com acetona em um líquido de limpeza ultra-sônico por 5 min, seguido de limpeza com metanol no líquido de limpeza ultra-sônico por 5 min, enxaguar em água por 5 min e soprando seco com N2.
- Girar o casaco fotorresiste com 1000 rpm por 3 s e então 3000 rpm por 30 s.
- Macio, Asse o fotorresiste a 100 ° C para 140 s.
- Expor com luz através do contato ôhmico UV máscara na potência de lâmpada 6,5 mW UV para 2,38 min sobre alinhador de máscara de fotolitografia.
- Post Asse o fotorresiste a 110 ° C para 80 s.
- Desenvolver em um desenvolvedor para 60 s com uma frequência de agitação de 1/s.
- Enxaguar em água DI por 3 min e secagem com N2.
- Carrega a amostra para o evaporador de feixe de elétrons.
- Sem a amostra de aquecimento, depósito de Ti/Au com uma espessura de 30/50 nm, medida pelo monitor de espessura de cristal de quartzo.
- Decolagem em acetona, seguida de limpeza em metanol por 5 min, enxaguar em água por 5 min e soprando seco com N2.
- Recoze o contato por annealer térmica rápida (RTA) a 300 ° C por 30 s.
- Verifica a resistência de contato através da linha de transição modelo (TLM) medição21.
- Fabricação de Schottky contatos na BeMgZnO/ZnO estende
- Siga os passos 4.1.1-4.1.7 para fotolitos de Schottky contato.
- Tratar a superfície da amostra com plasma de2 O remoto por 5 min com um fluxo de2 O do sccm 35 e uma potência de RF de 50 w.
- Siga os passos 4.1.8-4.1.10 para a deposição de Ag com uma espessura de 50 nm.
- Caracteriza a estrutura obtida através de medições de-V para os diodos de Schottky17.
Resultados
A coluna da esquerda da Figura 1 mostra a evolução do padrão RHEED gravado ao longo da direção azimutal [1-100] durante o crescimento da MBE de um ser de0,02Mg0,26ZnO/ZnO heterostructure com uma camada de HT-ZnO grossa nm 300 e 30 nm de espessura ser0,02 Barreira de ZnO0,26Mg. A coluna da direita mostra representativas morfologias de superfície em estágios de crescimento diferentes (não da mesma amostra). Como evidenciado desde a aparência de um padrão irregular de RHEED, a camada de buffer LT-ZnO é da natureza de modo de crescimento tridimensional (3D) ilha. Sua morfologia superficial foi melhorada com tratamento térmico de recozimento a uma temperatura acima de 700 ° C. Vê-se claramente que a superfície transformado de 3D para 2D morfologia. A camada subsequente de HT-ZnO continua a crescer em um modo 2D, seguido pelo crescimento 2D de ser0,02Mg0,26ZnO camada sem a formação de uma segunda fase. Medições de AFM têm mostrado que o modelo de GaN tem uma rugosidade de raiz média quadrática (RMS) de 0,28 nm para 5 × 5 μm2 scan. Uma superfície lisa com uma rugosidade RMS de 0,35 nm é obtido para a camada de HT-ZnO sem uma barreira crescendo sob condição de O rico e uma rugosidade RMS de 0.45 nm é observado após o crescimento da barreira BeMgZnO.
HRXRD triplo-eixo 2 θ-ω digitalizar para um típico Zn-polar ser0,02Mg0,26ZnO/ZnO heterostructure com uma camada de HT-ZnO grossa nm 300 e 50 nm de espessura ser0,02Mg0,26ZnO camada de barreira é mostrada na Figura 2. As reflexões em 34.46 ó34.54 óe 34.75 ó são consistentes com (0002) reflexões de ZnO, GaN e ser0,02Mg0,26ZnO, respectivamente. Note que a ampliação da reflexão de ser0,02Mg0,26ZnO é devido a sua magreza. A tensão biaxial elástica na camada de ZnO é uma indicação da heterostructure Zn-polar, como investigado em nossa anterior estudo13. Ser e conteúdo de Mg no quaternário BeMgZnO calcularam-se o ângulo de Bragg de sua energia XRD (0002) reflexão e emissão de fótons no espectro de LT-fotoluminescência (LT-PL) medida a 13 K (não mostrado).
A Figura 3 mostra os resultados das medições de temperatura-dependente efeito Hall para um ser de0,02Mg0,26ZnO/ZnO heterostructure. A concentração de portador de folha reduzida de 8,8 × 1012 cm-2 para 6,4 × 10-12 cm-2 quando a amostra foi arrefecida de temperatura ambiente (293 K) para aproximadamente 100 K. Com mais de resfriamento para 13 K, a concentração de portador de folha satura em 6,2 × 1012 cm-2. Esta constatação manifesta-se de que a redução observada na concentração de elétrons é originada a partir das contribuições de canais de condução paralela que inclui a camada de nucleação defeituosa e camada de HT-ZnO, bem como a ser0,02Mg0,26ZnO barreira, se for o caso. Esta tendência também tem sido relatada para MgZnO/ZnO estende10,22. A mobilidade de elétron na ser0,02Mg0,26ZnO/ZnO heterostructure monotônico aumenta com a diminuição da temperatura; tanto a mobilidade de 293 K de 206 cm2/Vs e a mobilidade de 13 K de 1550 cm2/Vs são comparáveis aos valores na literatura22,23. A evolução das propriedades eletrônicas em função da temperatura indica claramente a presença de 2DEG na ser0,02Mg0,26ZnO/ZnO heterointerface.
A Figura 4 mostra a corrente-tensão (V) curvas medida na temperatura de quarto para quatro representante Ag / ser0,02Mg0,26diodos de Schottky ZnO/ZnO com uma área de Schottky de 1,1 × 10-4 cm2 dentro de uma bolacha. As correntes para a frente aumentam exponencialmente com a tensão aplicada até 0,25 V, além do qual a tensão cai do outro lado a resistência série tornam-se aparentes. A maior altura de barreira Schottky de Φap de 1,07 eV foi atingida com um n de fator de idealidade de 1,22. Rácios de rectificação de cerca de 1 × 108 são obtidos usando os valores de corrente medidos em V= ± 2 V.
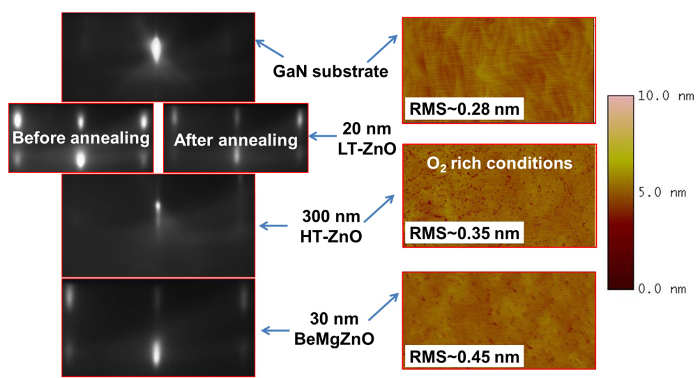
Figura 1. Caracterização de superfície. Coluna da esquerda mostra os padrões RHEED tomados ao longo da direção azimutal [1-100] durante o crescimento da MBE de um ser de0,02Mg0,26ZnO/ZnO heterostructure e coluna da direita apresenta as morfologias de superfície do modelo GaN, camada de HT-ZnO e ser 0.02camada de ZnO0,26Mg medido por AFM. LT-ZnO tecnologia de buffer permite o crescimento de modo 2D de alta qualidade estende de ZnO na baixos modelos de GaN retículo-incompatíveis. Clique aqui para ver uma versão maior desta figura.
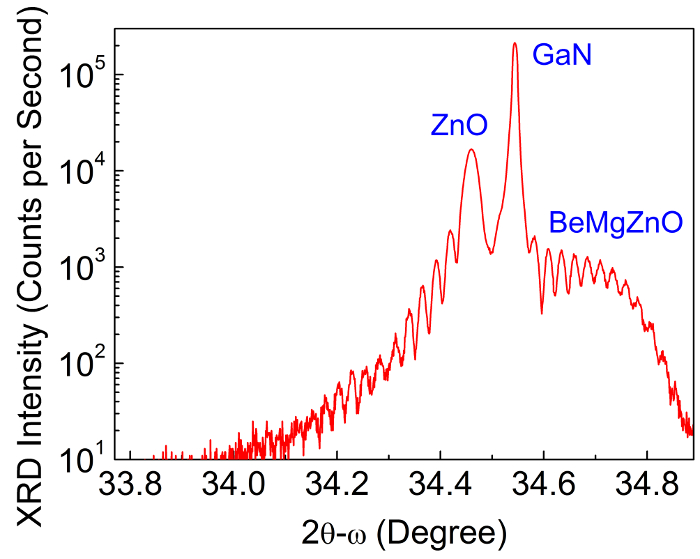
Figura 2. HRXRD da heterostructure. HRXRD triplo-eixo 2 θ-ω scan de um típico Zn-polar ser0,02Mg0,26heterostructure ZnO/ZnO com 50 nm de espessura ser0,02Mg0,26camada de barreira de ZnO. As reflexões em 34.46 ó34.54 óe 34.75 ó são consistentes com (0002) reflexões de ZnO, GaN e ser0,02Mg0,26ZnO, respectivamente. Clique aqui para ver uma versão maior desta figura.
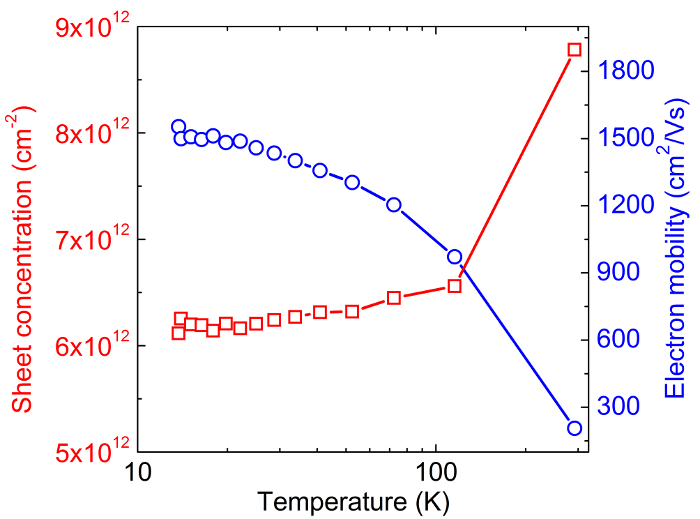
Figura 3. Propriedades eletrônicas da heterostructure. Dependências de temperatura da folha transportadora densidade elétron mobilidade e de um Zn-polar ser0,02Mg0,26ZnO/ZnO heterostructure. Clique aqui para ver uma versão maior desta figura.

Figura 4. Diodos de Schottky. Características típicas -V de quatro representante Ag / diodos de Schottky ZnO/ZnO0,02Mg0,26medido a temperatura. A semelhança das quatro curvas-V indica a alta uniformidade na bolacha da amostra. Clique aqui para ver uma versão maior desta figura.
Discussão
Incorporação de BeO MgZnO para formar o quaternário BeMgZnO fornece a viabilidade para sintonizar a extensão e o sinal de tensão no quaternário e, portanto, aumenta significativamente a densidade 2DEG8. Os representante resultados mostram que o ser0,02Mg0,26ZnO/ZnO heterostructure resultados em uma densidade de 2DEG perto da plasmon desejado-LO fônon ressonância elétron densidade (~ 7 × 1012 cm-2)24. Embora a mobilidade de elétrons da heterostructure fortemente depende dos parâmetros de crescimento de MBE tais como a temperatura do substrato e a relação de VI/II de ambos o HT-ZnO e a camada de barreira BeMgZnO, a densidade de 2DEG é fracamente dependentes das condições de crescimento e determinada principalmente pelo ser e o teor de Mg na barreira.
Um modelo de GaN é usado para o crescimento da BeMgZnO/ZnO estende com alta qualidade cristalina devido à incompatibilidade de treliça moderada de 1,8% entre GaN e ZnO, comparado com uma incompatibilidade de grande estrutura de 18% entre safira e ZnO. Para evitar qualquer canal condutor paralelo, é fundamental para ter uma alta resistência na faixa de MΩ/Praça para o modelo de GaN. No nosso caso, isto é conseguido através do crescimento a uma pressão de câmara baixa de 76 Torr para melhorar a compensação de carbono. Para garantir o controle de polaridade em estende o BeMgZnO/ZnO (Zn-polaridade), tratamento de superfície cuidado do modelo GaN é indispensável. Qualquer oxidação ou contaminação introduzida durante a preparação da superfície de GaN induziria Zn - e O-mistura-polaridade no estende até a relação determinante de VI/II < 1.5 é cumprido.
Qualquer reação química entre o metal e o semicondutor, a presença de contaminantes superficiais, afirma, defeitos nas proximidades da superfície e a difusão de metal para os semicondutores são problemas comuns no domínio da fabricação de Schottky contatos. Uma variedade de métodos tem sido relatada na literatura para a preparação da superfície de ZnO para fabricação contato Schottky. Entre eles está gravando em HCl (ou outros ácidos), física gravura com Ar+, Ozone UV, limpeza, tratamento em H2O2e O plasma2 (ou mistura com ele)25,26,27, 28. os procedimentos de gravura aponta para a remoção de uma camada de superfície com espessura um variando de alguns nanómetros a microns e, portanto, não pode ser aplicados para dispositivos HFET. A UV-ozônio limpeza ou procedimento de plasma O2 remove apenas a camada superficial. Portanto, é adequado para a preparação de superfície de nossa BeMgZnO/ZnO estende.
Geralmente contatos Schottky são alcançados mediante depósito de um metal de alta função de trabalho tais como Pd, Pt, infravermelho, etc. Em contraste, a Ag tem uma função de trabalho baixa de 4,26 eV. Apesar disso, dispositivos utilizando eletrodo Ag podem mostrar rectificativo comportamento devido a formação de uma camada de óxido de prata de interface causada pela oxidação parcial de Ag com oxigênio de ZnO matrix. A camada de óxido assim formada é transparente para elétrons e tem a função de trabalho superior em comparação com Ag. Raju et al. relataram a funções de trabalho cerca de 5,5 eV para atrás, crescida por deposição de laser pulsado (PLD), que é maior do que 1,3 eV de Ag e perto a característica da Pd, Pt e Ir29. Nossos resultados indicam que o eletrodo de Ag (com O2 plasma pré-tratamento na superfície de ZnO heterostructure) é um metal de contato promissor para a formação de diodos de Schottky.
Temos demonstrado um método para a fabricação de contatos de Schottky de alta qualidade para baseados em ZnO virais. Modelo de GaN MOCVD crescido com cuidadosa preparação de superfície antes de MBE crescimento e uma baixa relação de VI/II < 1.5 durante a nucleação de ZnO assegurar a orientação Zn-polar da estende com base em ZnO com alta qualidade. MOCVD é uma técnica de madura utilizado por Epitaxia de GaN para várias aplicações. O procedimento MBE descrito neste trabalho indica o combinability de técnicas de MOCVD e MBE e GaN e óxido de semicondutores para dispositivos eletrônicos. Incorporação de uma pequena quantidade de ser para os resultados de camada de barreira BeMgZnO em virais com 2DEG de alta densidade, mobilidade de elétron elevado e alta estabilidade térmica, para melhor desempenho de alta velocidade.
Divulgações
Os autores não têm nada para divulgar.
Agradecimentos
Este trabalho foi financiado pela força aérea escritório de científico pesquisa (AFOSR) sob Grant FA9550-12-1-0094.
Materiais
| Name | Company | Catalog Number | Comments |
| MOCVD | Emcore | custom-built | |
| MBE | SVT Associates | ||
| TMAl | SAFC | CAS: 75-24-1 | |
| TMGa | SAFC | CAS: 1445-79-0 | |
| NH3 | The Linde group | CAS: 7664-41-7 | |
| H2 | National Welders Supply Co. | supplier part no. 335-041 | Grade 5.0 |
| O2 | National Welders Supply Co. | supplier part no. OX 300 | Industrial Grade Oxygen, Size 300 Cylinder, CGA-540 |
| Mg | Sigma-Aldrich | Product No.: 474754-25G | MAGNESIUM, DISTILLED, DENDRITIC PIECES, 99.998% METALS BASIS |
| Be | ESPI Metals | Stock No. K646b | Beryllium pieces, 3N |
| Zn | Alfa Aesar, Thermo Fisher Scientific Chemicals Inc. | Product No.: 10760-30 | Zinc shot, 1-6mm (0.04-0.24in), Puratronic, 99.9999% |
| Au | Kurt J. Lesker | part no. EVMAUXX40G | Gold Pellets, 99.99% |
| Ag | Kurt J. Lesker | part no. EVMAG40QXQ | Silver Pellets, 99.99% |
| Ti | Kurt J. Lesker | part no. EVMTI45QXQ | Titanium Pellets, 99.995% |
| Developer | Rohm and Haas electronic Materials LLC | MF-CD-26 | Material number 10018050 |
| Photoresist | Rohm and Haas electronic Materials LLC | SPR 955 | Material number 10018283 |
Referências
- Morkoc, H., Solomon, P. M. The hemt: A superfast transistor: An experimental GaAs-AlGoAs device switches in picoseconds and generates little heat. This is just what supercomputers need. IEEE spectrum. 21 (2), 28-35 (1984).
- Aktas, O., et al. Microwave performance of AlGaN/GaN inverted MODFET's. IEEE Electron Device Letters. 18 (6), 293-295 (1997).
- Leach, J. H., et al. Effect of hot phonon lifetime on electron velocity in InAlN/AlN/GaN heterostructure field effect transistors on bulk GaN substrates. Applied Physics Letters. 96 (13), 133505 (2010).
- Sasa, S., et al. Microwave performance of ZnO/ZnMgO heterostructure field effect transistors. Physica status solidi (a). 208 (2), 449-452 (2011).
- Ye, D., et al. Enhancement-mode ZnO/Mg0.5Zn0.5O HFET on Si. Journal of Physics D: Applied Physics. 47 (25), 255101 (2014).
- Koike, K., et al. Molecular beam epitaxial growth of wide bandgap ZnMgO alloy films on (111)-oriented Si substrate toward UV-detector applications. Journal of Crystal Growth. 278 (1-4), 288-292 (2005).
- Du, X., et al. Controlled Growth of High-Quality ZnO-Based Films and Fabrication of Visible-Blind and Solar-Blind Ultra-Violet Detectors. Advanced Materials. 21 (45), 4625-4630 (2009).
- Ding, K., Ullah, M., Avrutin, V., Özgür, &. #. 2. 2. 0. ;., Morkoç, H. Investigation of high density two-dimensional electron gas in Zn-polar BeMgZnO/ZnO heterostructures. Applied Physics Letters. 111 (18), 182101 (2017).
- Ding, K., Avrutin, V., Özgür, &. #. 2. 2. 0. ;., Morkoç, H. III-Nitride Light-Emitting Diodes. Wiley Encyclopedia of Electrical and Electronics Engineering. , 1-21 (2017).
- Tsukazaki, A., et al. Quantum Hall effect in polar oxide heterostructures. Science. 315 (5817), 1388-1391 (2007).
- Tsukazaki, A., et al. Observation of the fractional quantum Hall effect in an oxide. Nat Mater. 9 (11), 889-893 (2010).
- Falson, J., et al. MgZnO/ZnO heterostructures with electron mobility exceeding 1 x 10(6) cm(2)/Vs. Sci Rep. 6, 26598 (2016).
- Ullah, M. B., et al. Polarity control and residual strain in ZnO epilayers grown by molecular beam epitaxy on (0001) GaN/sapphire. physica status solidi (RRL) Rapid Research Letters. 10 (9), 682-686 (2016).
- Ullah, M. B., et al. Characterization of Ag Schottky Barriers on Be0.02Mg0.26ZnO/ZnO Heterostructures. physica status solidi (RRL) - Rapid Research Letters. , (2017).
- Lee, J. H., et al. Schottky diodes prepared with Ag, Au, or Pd contacts on a MgZnO/ZnO heterostructure. Japanese Journal of Applied Physics. 51 (9S2), 09MF07 (2012).
- Singh, R., et al. Investigation of barrier inhomogeneities and interface state density in Au/MgZnO: Ga Schottky contact. Journal of Physics D: Applied Physics. 49 (44), 445303 (2016).
- Brillson, L. J., Lu, Y. ZnO Schottky barriers and Ohmic contacts. Journal of Applied Physics. 109 (12), 121301 (2011).
- Müller, S., et al. Method of choice for fabrication of high-quality ZnO-based Schottky diodes. Journal of Applied Physics. 116 (19), 194506 (1945).
- Figge, S., Böttcher, T., Einfeldt, S., Hommel, D. In situ and ex situ evaluation of the film coalescence for GaN growth on GaN nucleation layers. Journal of Crystal Growth. 221 (1-4), 262-266 (2000).
- Han, J., Ng, T. -. B., Biefeld, R., Crawford, M., Follstaedt, D. The effect of H 2 on morphology evolution during GaN metalorganic chemical vapor deposition. Applied Physics Letters. 71 (21), 3114-3116 (1997).
- Berger, H. Models for contacts to planar devices. Solid-State Electronics. 15 (2), 145-158 (1972).
- Tampo, H., et al. Polarization-induced two-dimensional electron gases in ZnMgO/ZnO heterostructures. Applied Physics Letters. 93 (20), 202104 (2008).
- Ye, J. D., et al. Two-dimensional electron gas in Zn-polar ZnMgO/ZnO heterostructure grown by metal-organic vapor phase epitaxy. Applied Physics Letters. 97 (11), 111908 (2010).
- Šermukšnis, E., et al. Hot-electron energy relaxation time in Ga-doped ZnO films. Journal of Applied Physics. 117 (6), 065704 (2015).
- Singh, C., Agarwal, G., Rao, G. D., Chaudhary, S., Singh, R. Effect of hydrogen peroxide treatment on the electrical characteristics of Au/ZnO epitaxial Schottky diode. Materials Science in Semiconductor Processing. 14 (1), 1-4 (2011).
- Mohanta, S., et al. Electrical characterization of Schottky contacts to n-MgZnO films. Thin Solid Films. 548, 539-545 (2013).
- Schifano, R., Monakhov, E., Grossner, U., Svensson, B. Electrical characteristics of palladium Schottky contacts to hydrogen peroxide treated hydrothermally grown ZnO. Applied Physics Letters. 91 (19), 193507 (2007).
- Ip, K., et al. Improved Pt/Au and W/Pt/Au Schottky contacts on n-type ZnO using ozone cleaning. Applied Physics Letters. 84 (25), 5133-5135 (2004).
- Raju, N. R. C., Kumar, K. J., Subrahmanyam, A. Physical properties of silver oxide thin films by pulsed laser deposition: effect of oxygen pressure during growth. Journal of Physics D: Applied Physics. 42 (13), 135411 (2009).
Reimpressões e Permissões
Solicitar permissão para reutilizar o texto ou figuras deste artigo JoVE
Solicitar PermissãoThis article has been published
Video Coming Soon
Copyright © 2025 MyJoVE Corporation. Todos os direitos reservados