Method Article
Fabbricazione di diodi Schottky su Zn-polar eterostruttura BeMgZnO/ZnO cresciuto di epitassia da fasci molecolari assistita da Plasma
In questo articolo
Riepilogo
Raggiungimento dei contatti Schottky di alta qualità è di importanza fondamentale per il raggiungimento di modulazione efficiente porta a eterostruttura transistor ad effetto di campo (HFET). Vi presentiamo la metodologia di fabbricazione e le caratteristiche dei diodi Schottky su Zn-polar BeMgZnO/ZnO eterostrutture con gas ad alta densità di elettrone dimensionale due (2DEG), cresciute di epitassia da fasci molecolari assistita da plasma su modelli di GaN.
Abstract
Transistor ad effetto campo di eterostruttura (HFET) utilizzando un canale di gas (2DEG) due elettroni dimensionale hanno un grande potenziale per applicazioni per dispositivi ad alta velocità. Ossido di zinco (ZnO), un semiconduttore con un ampio bandgap (3,4 eV) e la velocità di saturazione alta elettrone ha guadagnato molta attenzione come un materiale molto interessante per periferiche ad alta velocità. Modulazione di cancello efficiente, tuttavia, richiede contatti Schottky qualità sullo strato di barriera. In questo articolo, vi presentiamo la nostra procedura di fabbricazione del diodo Schottky su Zn-polar BeMgZnO/ZnO eterostruttura con 2DEG ad alta densità che si ottiene attraverso la modulazione di ceppo e incorporazione di pochi punti percentuali essere dentro la barriera basati su ZnMgO durante la crescita di Epitassia da fasci molecolari (MBE). Per ottenere alta qualità cristallina, quasi grata-abbinato ad alta resistività GaN modelli cresciute di deposizione di vapore chimico metallo-organici (MOCVD) vengono utilizzati come substrato per la successiva crescita MBE di strati di ossido. Per ottenere il requisito Zn-polarità, attento trattamento di superficie di GaN vengono utilizzati modelli e controllo sopra il rapporto di VI/II durante la crescita della temperatura insufficiente strato di nucleazione di ZnO. Elettrodi di ti/Au servono come contatti ohmici ed elettrodi di Ag depositati sul plasma2 O pretrattato BeMgZnO superficie sono utilizzati per contatti Schottky.
Introduzione
Eterostruttura transistor ad effetto campo (HFET) basato su due gas dimensionale elettroni (2DEG) hanno un potenziale promettente per le applicazioni ad alta velocità dispositivi elettronici1,2,3. Ossido di zinco (ZnO) come un semiconduttore ampio bandgap (3,4 eV) con velocità di saturazione alta elettrone ha guadagnato la considerevole attenzione come una piattaforma per HFET4,5. Barriera convenzionalmente usato materiale ZnMgO ternario richiedono un altissimo contenuto di Mg (> 40%) coltivate a substrato basse temperature (300 ° C o inferiore)6,7e come tale queste strutture siano in grado di degradare in operazioni ad alta potenza e durante i trattamenti termici, anche se la densità di carica indesiderata nella barriera è abbastanza bassa per modulazione di cancello. Per aggirare questo ostacolo, che abbiamo proposto e adottato BeMgZnO come la barriera, in cui il segno di sforzo nella barriera può essere commutato da compressione alla trazione tramite l'incorporazione di berillio (Be), rendendo la spontanea e piezoelectricpolarizations a essere additivo. Di conseguenza, 2DEG ad alta concentrazione può essere realizzato con relativamente moderato contenuto di Mg. Utilizzando questo approccio, 2DEG ad alta densità è osservata vicino la plasmonica-LO fonone risonanza (~ 7 × 1012 cm-2) in BeMgZnO/ZnO eterostrutture mentre il contenuto di Mg sottostante è 30% e l'essere contenuto è solo a 2 ~ 3%8.
Grazie alla sua simmetria cristallina simile, UV e trasparenza alla luce visibile, robusta proprietà fisiche e chimiche e basso costo, c-aereo zaffiro è ampiamente impiegato per epitassia di GaN e di ZnO. Grazie ai notevoli progressi nella tecnologia di crescita di GaN-base elettronica e dispositivi optoelettronici su saphhire, modelli di GaN di alta qualità possono essere facilmente prodotto su substrati dello zaffiro utilizzando AlN o buffer a bassa temperatura (LT) GaN, nonostante il divario di reticolo grande del 16% con zaffiro9. Crescita epitassiale di ZnO, che ha un ancora più grande divario di reticolo nel piano del 18% con vetro zaffiro, è ben nota per la varietà O polari, mentre la crescita di Zn-polar materiale in modalità bidimensionale non è ben fissata. A causa del divario di reticolo moderata dell'1,8%, epitassia di ZnO su GaN è un'alternativa attraente.
Sia MOCVD e MBE sono il maggior successo tecniche di deposizione di semiconduttori per la realizzazione di film sottili di alta qualità ed eterostrutture con elevata riproducibilità. Il motivo principale che MBE è meno popolare di MOCVD per epitassia di GaN è il costo e l'inadeguatezza per la produzione di massa. Il tasso di crescita a GaN di MOCVD può essere parecchi micrometri all'ora e decine di cialde di diametro di 2 pollici (50 mm) o quelli grandi come 6-8" possono essere coltivate in una fase9. Qui, adottiamo MOCVD per la crescita di GaN nel nostro studio. Per la crescita della base di ZnO eterostrutture, tuttavia, rapporti più sulla formazione di 2DEG sono realizzate da MBE al momento prima della commercializzazione delle potenziali applicazioni10,11,12. Recentemente, abbiamo sviluppato una crescita MBE di eterostrutture di ZnO di alta qualità con un accurato controllo della polarità superficiale su GaN Ga-polar modelli13. È stato trovato che con il trattamento pre-esposizione di Zn, ZnO strati coltivati così esposte Zn-polarità quando nucleate con rapporti bassi VI/II (< 1.5), mentre quelli nucleate con rapporti VI/II sopra 1.5 hanno esibito O polarità. Per evitare il canale di conduzione parallele attraverso modelli di GaN, abbiamo adottato carbonio compensata semi-isolante GaN MOCVD coltivate in condizioni di bassa pressione su AlN buffer per la successiva crescita di strutture di base di ZnO HFET.
Prima del nostro lavoro14, non ha stato rapporti sulle indagini di diodi Schottky su eterostrutture BeMgZnO/ZnO. Solo parecchi studi hanno riferito sui contatti Schottky a ZnMgO15,16, ad es., con un fattore di idealità di 2,37, un'altezza di barriera di 0,73 eV e un rapporto di rettifica di solo 103 15. Vari metalli di Schottky sono stati utilizzati per ZnO17, e fra loro, argento (Ag) è stato ampiamente adottato, a causa di una relativamente alta Schottky barriera altezza di 1,11 eV su massa ZnO con un fattore di idealità di 1,08 18.
In questo lavoro, puntiamo a fabbricare diodi Schottky di alta qualità per le applicazioni in dispositivi HFET ad alta velocità basati su ZnO. Il seguente protocollo si applica in particolare alla fabbricazione di diodi Schottky Ag/BeMgZnO/ZnO per evaporazione e-fascio di Ag sulle eterostrutture di BeMgZnO/ZnO cresciuto di MBE assistita da plasma su modelli depositati MOCVD GaN.
Protocollo
1. crescita e preparazione di GaN modello per crescita MBE
- Crescita del semi-isolante GaN modello di MOCVD
- Assicurarsi che la valvola a saracinesca isolando la camera di carico-serratura dal reattore è chiuso. Sfogare il carico-blocco con N2 alla pressione atmosferica. Aprire il blocco carico di stipulare titolare del substrato.
- Caricare il substrato di zaffiro 2-pollice sul supporto e quindi posizionare il titolare nuovamente dentro il blocco di carico. Pompa giù la pressione di carico-serratura fino a 2.5 × 10-2 Torr di una pompa meccanica a secco.
- Sfogare il carico-blocco con N2 per equalizzare la pressione con quello nel vano reattore (15 Torr).
- Aprire la valvola di isolamento di carico-serratura e caricare il titolare del gruppo di supporto del campione nel reattore. Accendere il motore di rotazione e impostare la velocità di rotazione del substrato-titolare di 100 giri/min. Quindi chiudere la saracinesca.
- Garantire che l'acqua di raffreddamento è in esecuzione, entrambi H2 NH3 rifornimento è sufficiente, mass flow controller (MFC) e valori di pressione controller (PC) sono gli stessi come il setpoint e titolare del substrato è in rotazione.
- Interruttore del gas sistema da N2 H2. Accendere il monitor di riflettanza ottici in situ .
- Avviare la crescita avviando il file ricetta che preinstalli tutti i parametri di crescita compreso il dilagare del substrato temperature, portate di gas e pressione del reattore e commutazione delle valvole.
- Rampa la pressione del reattore a 30 Torr in 3 minuti e la temperatura del substrato a 1055 ° C a desorbimento contaminazioni residue dalla superficie del substrato per 3 min in ambiente di2 H.
- Rampa di discesa della temperatura di substrato a 941 ° C per la nucleazione e la crescita di layer di buffer di bassa temperatura (LT) AlN.
- Stabilizzare il flusso di trimethylaluminum (TMAl) come 12 standard centimetri cubici per minuto (sccm) e ammoniaca (NH3) flusso come sccm 7 e la temperatura del substrato per 3 min.
- Avviare la crescita dello strato LT-AlN passando TMAl da sfogo alla riga di esecuzione.
- Controllare lo spessore dello strato LT-AlN utilizzando un sistema di misura della riflettività su misura, che comprende un diodo laser di 637 nm, un fotorivelatore Si p-i-n e un software basato su Labview. Determinare il tasso di crescita del periodo di riflettività oscillazioni19,20. In campioni selezionati, è possibile utilizzare immagini di microscopia elettronica scansione a sezione trasversale di microscopia elettronica e trasmissione per confermare l'esattezza di in situ di monitoraggio.
- Mantenere la crescita per 6 min raggiungere uno spessore di ~ 20 nm, quindi salita la temperatura del substrato a 1100 ° C in 3 min senza un'interruzione della crescita e continuare la crescita dello strato di AlN ad uno spessore di 300 nm, come monitorati dall'evoluzione dell'oscillazione della in s ITU ottico riflettanza.
- Interruttore TMAl dalla pista allo sfiato e quindi alla linea di inattività per fermare la crescita di AlN. Stabilizzare il flusso di trimetilgallio (TMGa) a 15,5 sccm, rampa il flusso3 NH a 7000 sccm e stabilizzare per 1 min. rampa fino alla pressione del reattore a 76 Torr in 1 min rampa fino alla temperatura del substrato a 1107 ° C in 1 min.
- Nucleazione e crescere uno strato di recupero GaN con uno spessore di ~ 400 nm, mentre il monitoraggio dell'evoluzione di riflettività. Inizialmente la riflettività presenta una forte diminuzione quando GaN isole mononucleate sulla superficie di AlN e quindi recupera l'intensità al livello originale, corrispondente a una superficie piana in modo atomico quando si uniscono le isole.
- Rampa del substrato da 1124 ° C in 2 min coltiva lo strato di GaN semi-isolante ad alta temperatura con uno spessore di mm ~2.5. fermare la crescita passando TMGa dalla pista allo sfiato e quindi alla linea di inattività.
- Raffreddare il substrato a temperatura ambiente per un periodo di 40 min.
- Rampa di discesa della pressione del reattore a 15 Torr per un periodo di 1,5 min.
- Scaricare il substrato dal reattore seguendo la procedura inversa delle fasi 1.1.1-1.1.4.
- GaN modello preparazione e caricamento reattore MBE
- Tagliare il modello di GaN 2 pollici in 6 parti uguali a forma di torta utilizzando uno scriber diamante.
- Preparare soluzione acida aqua regia all'interno della cappa fumi acidi aggiungendo acido nitrico (HNO3, 68,0-70.0 w/w%, 50 mL) di acido cloridrico (HCl, w/w% 150 mL, 36,5-38,0) lentamente in un becher di quarzo.
- Mettere il bicchiere di acqua ragia su un piatto caldo con una temperatura di 220 ° C.
- Dopo la comparsa di un colore rosso-arancio e bolle di gas, un modello a forma di torta di GaN di ammollo nella soluzione e bollire per 10 min.
- Sciacquare il modello GaN in acqua deionizzata (DI) per 3 min.
- Immergere il modello di GaN in HCl (soluzione O 36.5-38,0 w/w%):H2(1:1) per 3 min a rimuovere l'ossido di Ga.
- Sciacquare il modello GaN in esecuzione DI acqua per 5 minuti.
- Asciugare il modello con gas2 N.
- Inserire il modello di GaN pulito su un supporto di Mo e caricarlo immediatamente nella camera di carico-blocco MBE.
- Inizi a pompare giù il carico-blocco di una pompa meccanica a secco.
2. MBE crescita di eterostrutture di BeMgZnO/ZnO
- Preparazione delle celle di effusione
- Dopo il pompaggio verso il basso il blocco di carico per 1 h, inizia la preparazione di Zn, Mg, essere celle di effusione. Impostare la temperatura della zona superiore della cella Zn doppio-zona a 525 ° C con un tasso di rampa di 17 ° C/min, attendere 5 min poi rampa fino a 515 ° C con un tasso di rampa di 5 ° C/min. impostare la temperatura di cella di Mg a 570 ° C con un tasso di rampa di 15 ° C/min , dopo aver raggiunto il set point, attendere 10 min poi rampa la cella di Mg fino a 300 ° C. Impostare l'essere temperatura cella a 900 ° C con un tasso di rampa di 10 ° C/min, dopo aver raggiunto il set point, aspettare 3 minuti poi rampa la cella fino a 650 ° C.
- Dopo 30 min, è possibile impostare la temperatura della zona inferiore della cella Zn doppio-zona a 360 ° C con un tasso di rampa di 10 ° C/min.
- Dopo il pompaggio verso il basso il blocco di carico per 2 h raggiungere una pressione di ~ 5 × 10-7 Torr, accendere il sistema di diffrazione (RHEED) elettrone ad alta energia di riflessione e caricare il modello di GaN nella camera di MBE.
- Regolare l'angolo del modello GaN ruotando il manipolatore per monitorare l'evoluzione del modello RHEED lungo direzione azimutale [1-100].
- Impostare la temperatura della zona inferiore della cella Zn doppio-zona a 355 ° C con un tasso di rampa di 10 ° C/min.
- Controllo della polarità di ZnO su GaN e crescita del buffer LT-ZnO
- Salita la temperatura del substrato a 615 ° C con un tasso di rampa di 13,6 ° C/min fino a desorbimento contaminazioni residue dalla superficie del substrato per 15 min.
- Rampa di discesa della temperatura del substrato da 615 a 280 ° C con un tasso di rampa di 13,6 ° C/min per la crescita di LT-ZnO. Quando la temperatura raggiunge i 550 ° C, aprire l'otturatore di cella Zn per esporre la superficie del modello di GaN con flusso di Zn. Accendere O2 plasma alimentazione, impostare la potenza di 100 W e controllo per verificare che la linea del gas O per2 è chiuso.
- Quando la temperatura raggiunge i 280 ° C, è possibile impostare la potenza di plasma O2 a 400 W, insieme O2 portata a 0,3 sccm per accendere il plasma quindi diminuire la portata di2 O di 0,25 sccm.
- Attendere per 1 min, quindi aprire l'otturatore2 O per avviare la crescita di strato cuscinetto LT-ZnO.
- Registrare un modello RHEED ogni 5 min. Dopo essere cresciuto per circa 15 min corrispondente ad uno spessore di buffer di ~ 20 nm, quando il modello RHEED cambia da strisce (modalità 2D) a punti ellittici (modalità 3D), chiudere sia Zn e O2 tapparelle per fermare la crescita.
- Impostare la velocità di flusso2 O per 0,4 sccm e impostare la temperatura del substrato a 730 ° C con un tasso di rampa di 13,6 ° C/min per temprare lo strato tampone del LT-ZnO. Impostare la temperatura della zona inferiore della cella Zn doppio-zona a 345 ° C con un tasso di rampa di 10 ° C/min per la crescita dello strato HT-ZnO.
- Quando la temperatura del substrato raggiunge il set-point di 730 ° C, attendere 5 minuti e controllare la superficie di ZnO di RHEED. Quando il modello RHEED transita da 3D a 2D, smettere di ricottura di dilagare verso il basso la temperatura del substrato a 700 ° C.
- Crescita dello strato di ZnO ad alta temperatura
- Quando la temperatura del substrato raggiunge i 700 ° C e si stabilizza, aumentare il tasso di flusso O2 3,2 sccm.
- Avviare la crescita dello strato HT-ZnO aprendo contemporaneamente sia Zn e O2 persiane.
- Crescere il livello di HT-ZnO per ~ 140 min raggiungere uno spessore di ~ 300 nm. Registrare i modelli RHEED diverse volte durante la crescita per confermare la modalità di crescita 2D.
- Fermare la crescita dello strato HT-ZnO chiudendo contemporaneamente sia Zn e O2 persiane.
- Crescita della barriera BeMgZnO
- Impostare la velocità di flusso O2 0,3 sccm, impostare l'essere temperatura cella a 820 ° C con un tasso di rampa di 10 ° C/min, impostare la temperatura della cella Mg 510 ° C con un tasso di rampa di 15 ° C/min e impostare la temperatura del substrato a 325 ° C con un tasso di rampa di 13,6 ° C/min per la crescita della barriera BeMgZnO.
- Quando si stabilizza la temperatura del substrato, aumentare il tasso di flusso O2 1.25 sccm e avviare la crescita di simultanea apertura Zn, Mg, Be e O2 persiane.
- Crescere il livello di barriera BeMgZnO per ~ 12 minuti per raggiungere uno spessore di ~ 30 nm. Record RHEED modelli diverse volte durante la crescita per monitorare l'evoluzione di modalità di crescita.
- Fermare la crescita dello strato BeMgZnO chiudendo la Mg ed essere otturatore, pur mantenendo le Zn e O2 otturatore aperto per 1 min avere uno strato di PAC ~ 2 nm spesso ZnO.
- Concludo che la crescita sia Zn e O2 serrande di chiusura.
- Rampa di discesa della temperatura del substrato alla sua temperatura di standby 150 ° C. Diminuire il tasso di flusso O2 0,25 sccm.
- Quando la temperatura del substrato è inferiore a 250 ° C, diminuire la potenza del plasma di2 O a 100 W, spegnere O2 plasma alimentazione, diminuire la portata di O2 a 0, chiudere la linea di gas O2 e raffreddare le temperature di cella in standby condizioni.
- Attendere che la temperatura del substrato di raggiungere la temperatura di standby 150 ° C, aprire la saracinesca di camera di crescita e scaricare il titolare di wafer alla camera di carico-serratura.
- Il vano di carico-serratura con N2 gas di sfiato e togliere il campione.
3. caratterizzazioni
- All'incirca misurare lo spessore del campione utilizzando un profiler di passaggio, attraverso l'area coperta sul bordo del campione.
- Valutare la qualità strutturale, ceppo e spessore dell'eterostruttura mediante diffrazione di raggi x (HRXRD) (2q-w scansioni di riflessione (0002)) ad alta risoluzione.
- Tagliare il campione in 5 × 5 mm2 pezzo quadrato utilizzando una penna di diamante. Esaminare le proprietà elettroniche del campione tramite misure di temperatura dipendente effetto Hall nella geometria van der Pauw, con Indio (In) puntini come elettrodi di contatto.
- Controllare la morfologia superficiale mediante microscopia a forza atomica (AFM).
4. fabbricazione di diodi Schottky
- Fabbricazione dei contatti ohmici su eterostrutture BeMgZnO/ZnO
- Sgrassare il campione (~ 20 × 20 mm2 dimensioni) con acetone in un pulitore ad ultrasuoni per 5 min, seguita da lavaggio con metanolo nel pulitore ad ultrasuoni per 5 min, sciacquare in acqua deionizzata per 5 min e soffiando asciutto con N2.
- Spin di photoresist cappotto con 1000 per 3 s e quindi 3000 giri/min per 30 s.
- Cuocere morbido il photoresist a 100 ° C per 140 s.
- Esporre con UV luce attraverso il contatto ohmico maschera alla potenza di lampada 6,5 mW UV per 2,38 min su aligner maschera fotolitografia.
- Post cuocere il photoresist a 110 ° C per 80 s.
- Sviluppare in uno sviluppatore per 60 s con una frequenza di agitazione di 1/s.
- Sciacquare in acqua deionizzata per 3 min e colpo secco con N2.
- Caricare l'esempio nell'evaporatore del fascio di elettroni.
- Senza riscaldamento del campione, depositare Ti/Au con uno spessore di 30/50 nm, come misurato dal monitor di spessore di cristallo di quarzo.
- Lift-off in acetone, seguita da pulizia in metanolo per 5 min, sciacquare in acqua deionizzata per 5 min e soffiando a secco con N2.
- Temprare il contatto di rapido forno di ricottura termica (RTA) a 300 ° C per 30 s.
- Controllare la resistenza di contatto attraverso transizione linea modello (TLM) misura21.
- Fabbricazione di Schottky contatti su BeMgZnO/ZnO eterostrutture
- Seguire i passi 4.1.1-4.1.7 per fotolitografia di contatto dello Schottky.
- Trattare la superficie del campione con il plasma di2 O remoto per 5 min con un flusso di2 O di sccm 35 e una potenza RF di 50 w.
- Seguire i passi 4.1.8-4.1.10 per la deposizione di Ag con uno spessore di 50 nm.
- Caratterizzano la struttura ottenuta da misure I-V per i diodi Schottky17.
Risultati
Colonna di sinistra della Figura 1 Mostra l'evoluzione del modello RHEED registrato lungo la direzione azimutale [1-100] durante la crescita MBE di un essere0,02Mg0.26ZnO/ZnO eterostruttura con uno strato di HT-ZnO spessore di 300 nm e un 30 nm di spessore essere0,02 Barriera di ZnO0,26Mg. La colonna di destra mostra rappresentative morfologie di superficie nelle fasi di crescita diversi (non dallo stesso campione). Come evidenziato dalla comparsa di un reticolo RHEED fiacchi, lo strato di tampone LT-ZnO è di natura di modalità di crescita tridimensionale (3D) isola. La morfologia superficiale è stata migliorata dal trattamento termico di ricottura a temperature superiori a 700 ° C. Si vede chiaramente che la superficie trasformata da 3D a 2D morfologia. Il successivo strato di HT-ZnO continua a crescere in una modalità 2D, seguita dalla crescita 2D di essere0,02Mg0.26ZnO strato senza la formazione di una seconda fase. Misure AFM hanno dimostrato che il modello di GaN ha una rugosità quadratico medio (RMS) di 0.28 nm per 5 × 5 μm2 scansione. Una superficie liscia con una rugosità RMS di 0,35 nm è ottenuta per lo strato di HT-ZnO senza una barriera di crescere sotto condizione O ricchi e una rugosità RMS di 0,45 nm è osservata dopo la crescita della barriera BeMgZnO.
HRXRD triple-asse 2 θ-ω scansione per un tipico Zn-polar essere0,02Mg0.26ZnO/ZnO eterostruttura con uno strato di HT-ZnO spesso nm 300 e 50 nm di spessore essere0,02Mg0.26ZnO strato barriera è illustrato nella Figura 2. Le riflessioni 34.46 o, 34.54 oe 34.75 o sono coerenti con (0002) riflessioni di ZnO, GaN ed essere0,02Mg0.26ZnO, rispettivamente. Si noti che l'ampliamento della riflessione da essere0,02Mg0.26ZnO è a causa della sua magrezza. Lo sforzo a trazione biassiale nello strato ZnO è un'indicazione di eterostruttura Zn-polare, come indagato nel nostro precedente studio13. Essere e contenuto di Mg nel Quaternario BeMgZnO sono stati calcolati dall'angolo di Bragg della sua energia del fotone XRD (0002) riflessione ed emissione nello spettro LT-fotoluminescenza (LT-PL) misurato a 13 K (non mostrato).
La figura 3 Mostra i risultati delle misurazioni di effetto Hall di temperatura-dipendente per un essere0,02Mg0.26ZnO/ZnO eterostruttura. La concentrazione in elemento portante foglio ridotto da 8,8 × 1012 cm-2 a 6,4 × 1012 cm-2 quando il campione è stato raffreddato dalla temperatura ambiente (293 K) a circa 100 K. Con ulteriore raffreddamento a 13 K, la concentrazione in elemento portante foglio satura a 6,2 × 1012 cm-2. Questa constatazione si manifesta che la riduzione osservata nella concentrazione dell'elettrone è provenuta dai contributi da canali di conduzione parallele sono difettosi nucleazione strato e strato di HT-ZnO, nonché essere0,02Mg0.26ZnO barriera, se presente. Questa tendenza è stata segnalata anche per ZnMgO/ZnO eterostrutture10,22. La mobilità di elettrone nell'essere0,02Mg0.26ZnO/ZnO eterostruttura aumenta monotonicamente con la diminuzione della temperatura; sia la mobilità di 293 K di 206 cm2/vs e la mobilità di 13K di 1550 cm2/vs sono paragonabili ai valori nella letteratura22,23. L'evoluzione delle proprietà elettroniche in funzione della temperatura indica chiaramente la presenza di 2DEG presso l'essere0,02Mg0.26ZnO/ZnO heterointerface.
La figura 4 Mostra la corrente-tensione (-V) curve misurato a temperatura ambiente per quattro rappresentante Ag / essere0,02Mg0.26diodi Schottky di ZnO/ZnO con una superficie di Schottky di 1.1 × 10-4 cm2 all'interno di un wafer. Le correnti avanti incrementa esponenzialmente con la tensione applicata fino a 0,25 V, oltre il quale la tensione scende attraverso la resistenza di serie diventata evidente. il più alta altezza di barriera di Schottky di Φap di 1,07 eV è stata raggiunta con un fattore di idealità n di 1.22. Rapporti di rettifica di circa 1 × 108 sono stati ottenuti utilizzando i valori correnti misurati a V= ± 2 V.
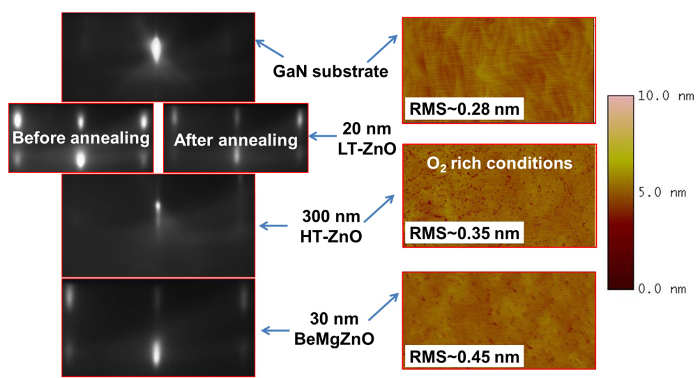
Figura 1. Caratterizzazione superficiale. Colonna di sinistra mostra i modelli di RHEED presi lungo la direzione azimutale [1-100] durante la crescita MBE di un essere0,02Mg0.26ZnO/ZnO eterostruttura e colonna di destra presenta le morfologie superficiali del modello GaN, strato HT-ZnO ed essere 0,02strato di ZnO0,26Mg misurata da AFM. LT-ZnO tecnologia buffer consente la crescita di 2D-modalità di eterostrutture di ZnO di alta qualità basso modelli di GaN non corrispondenti della grata. Clicca qui per visualizzare una versione più grande di questa figura.
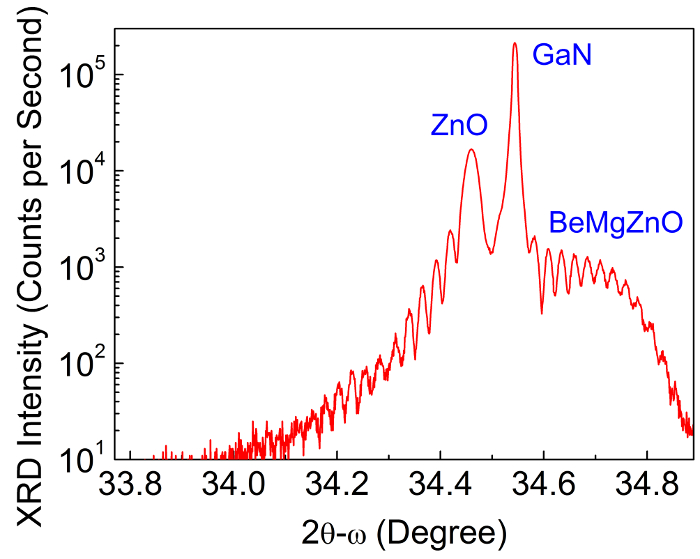
Figura 2. HRXRD dell'eterostruttura. HRXRD triple-asse 2 θ-ω la scansione di un tipico Zn-polar essere0,02Mg0.26ZnO/ZnO eterostruttura con un 50 nm di spessore essere0,02Mg0.26strato barriera di ZnO. Le riflessioni 34.46 o, 34.54 oe 34.75 o sono coerenti con (0002) riflessioni di ZnO, GaN ed essere0,02Mg0.26ZnO, rispettivamente. Clicca qui per visualizzare una versione più grande di questa figura.
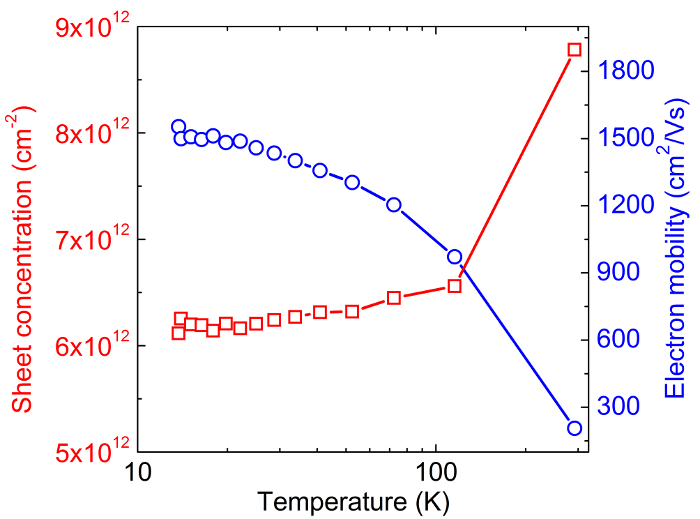
Figura 3. Proprietà elettroniche dell'eterostruttura. Dipendenze di temperatura di mobilità di elettrone e densità dei portatori di foglio di un Zn-polar essere0,02Mg0.26ZnO/ZnO eterostruttura. Clicca qui per visualizzare una versione più grande di questa figura.

Figura 4. Diodi Schottky. Caratteristiche tipiche -V di quattro rappresentante Ag / essere diodi dello Schottky ZnO/ZnO di0,02Mg0.26misurato a temperatura ambiente. La somiglianza delle quattro curve I-V indica l'alta uniformità in cialda del campione. Clicca qui per visualizzare una versione più grande di questa figura.
Discussione
Incorporazione di BeO ZnMgO per formare il Quaternario BeMgZnO fornisce la fattibilità per ottimizzare la portata e il segno del ceppo nel Quaternario e quindi aumenta significativamente il 2DEG densità8. I risultati rappresentativi dimostrano che l'essere0,02Mg0.26ZnO/ZnO eterostruttura risultati in una densità di 2DEG vicino il plasmone desiderata-LO fonone risonanza dell'elettrone densità (~ 7 × 1012 cm-2)24. Anche se la mobilità di elettrone dell'eterostruttura dipende fortemente i parametri di crescita MBE come la temperatura del substrato e VI/II rapporto di HT-ZnO e lo strato di barriera BeMgZnO, la densità di 2DEG è debolmente dipendente sulle condizioni di crescita e determinata principalmente dall'essere e il contenuto di Mg nella barriera.
Per la crescita di BeMgZnO/ZnO eterostrutture con alta qualità cristallina a causa del divario di reticolo moderata dell'1,8% tra GaN e ZnO, confrontato con un divario di grande reticolo del 18% tra zaffiro e ZnO viene utilizzato un modello di GaN. Per evitare qualsiasi canale parallelo conduttivo, è fondamentale disporre di un'elevata resistenza nel campo di MΩ/piazza per il modello di GaN. Nel nostro caso, ciò si ottiene da una crescente ad una pressione bassa camera di 76 Torr per migliorare la compensazione di carbonio. Per garantire il controllo della polarità in eterostrutture il BeMgZnO/ZnO (Zn-polarità), attento trattamento di superficie del modello di GaN è indispensabile. Qualsiasi ossidazione o contaminazione introdotta durante la preparazione sulla superficie GaN indurrebbe Zn - e O-mix-polarità in eterostrutture anche il rapporto VI/II determinante < 1.5 è soddisfatta.
Qualsiasi reazione chimica tra il metallo e il semiconduttore, la presenza di contaminanti di superficie, afferma, difetti in prossimità della superficie e la diffusione del metallo in semiconduttore sono problemi comuni nel campo della fabbricazione di Schottky contatti. Una varietà di metodi è stata segnalata nella letteratura per la preparazione della superficie di ZnO per fabbricazione contatto dello Schottky. Fra loro è Incisione acquaforte in HCl (o altri acidi), fisico con Ar+, UV ozono pulizia, trattamento in H2O2e O2 plasma (o miscela con lui)25,26,27, 28. le procedure di incisione mirare per la rimozione di uno strato superficiale con spessore un che vanno da pochi nanometri a micron e pertanto non può essere applicate per dispositivi HFET. L'UV-ozono pulizia o procedimento di O2 plasma rimuove solo lo strato superficiale. Di conseguenza, è adatto per la preparazione della superficie del nostro eterostrutture di BeMgZnO/ZnO.
Solitamente si ottengono contatti Schottky depositando un metallo alta funzione di lavoro quale Pd, Pt, Ir, ecc. Al contrario, Ag ha una funzione di lavoro bassa di 4,26 eV. Nonostante ciò, dispositivi che utilizzano elettrodo Ag possono mostrare comportamento rettifica a causa la formazione di uno strato di ossido di argento interfaccia causato da ossidazione parziale di Ag con ossigeno dalla matrice di ZnO. Lo strato di ossido così formato è trasparente per gli elettroni ed ha funzione di lavoro superiore rispetto ad Ag. Raju et al. sono segnalati funzioni lavoro circa 5,5 eV per fa coltivato da deposizione laser pulsato (PLD), che è 1,3 eV superiore a quello di Ag, nei pressi della caratteristica di Pd, Pt e Ir29. I nostri risultati indicano che tale elettrodo Ag (con pretrattamento al plasma2 O sulla superficie di ZnO eterostruttura) è un metallo contatto promettente per la formazione dei diodi Schottky.
Abbiamo dimostrato un metodo per la realizzazione di contatti Schottky di alta qualità per HFET a base di ZnO. Modello di GaN MOCVD cresciuto con un'attenta preparazione della superficie appena prima della crescita MBE e un rapporto basso di VI/II < 1.5 durante ZnO nucleazione garantire l'orientamento Zn-polar la base di ZnO eterostrutture con alta qualità di. MOCVD è una tecnica matura ampiamente usato per epitassia di GaN per varie applicazioni. La procedura descritta in questo lavoro MBE indica la combinabilità di tecniche MOCVD e MBE e GaN e ossidi semiconduttori per dispositivi elettronici. Incorporazione di una piccola quantità di essere nei risultati di strato di barriera BeMgZnO in HFET con 2DEG ad alta densità, elevata mobilità e alta stabilità termica, per una maggiore prestazione ad alta velocità.
Divulgazioni
Gli autori non hanno nulla a rivelare.
Riconoscimenti
Questo lavoro è stato supportato da Air Force Office di Scientific Research (AFOSR) sotto Grant FA9550-12-1-0094.
Materiali
| Name | Company | Catalog Number | Comments |
| MOCVD | Emcore | custom-built | |
| MBE | SVT Associates | ||
| TMAl | SAFC | CAS: 75-24-1 | |
| TMGa | SAFC | CAS: 1445-79-0 | |
| NH3 | The Linde group | CAS: 7664-41-7 | |
| H2 | National Welders Supply Co. | supplier part no. 335-041 | Grade 5.0 |
| O2 | National Welders Supply Co. | supplier part no. OX 300 | Industrial Grade Oxygen, Size 300 Cylinder, CGA-540 |
| Mg | Sigma-Aldrich | Product No.: 474754-25G | MAGNESIUM, DISTILLED, DENDRITIC PIECES, 99.998% METALS BASIS |
| Be | ESPI Metals | Stock No. K646b | Beryllium pieces, 3N |
| Zn | Alfa Aesar, Thermo Fisher Scientific Chemicals Inc. | Product No.: 10760-30 | Zinc shot, 1-6mm (0.04-0.24in), Puratronic, 99.9999% |
| Au | Kurt J. Lesker | part no. EVMAUXX40G | Gold Pellets, 99.99% |
| Ag | Kurt J. Lesker | part no. EVMAG40QXQ | Silver Pellets, 99.99% |
| Ti | Kurt J. Lesker | part no. EVMTI45QXQ | Titanium Pellets, 99.995% |
| Developer | Rohm and Haas electronic Materials LLC | MF-CD-26 | Material number 10018050 |
| Photoresist | Rohm and Haas electronic Materials LLC | SPR 955 | Material number 10018283 |
Riferimenti
- Morkoc, H., Solomon, P. M. The hemt: A superfast transistor: An experimental GaAs-AlGoAs device switches in picoseconds and generates little heat. This is just what supercomputers need. IEEE spectrum. 21 (2), 28-35 (1984).
- Aktas, O., et al. Microwave performance of AlGaN/GaN inverted MODFET's. IEEE Electron Device Letters. 18 (6), 293-295 (1997).
- Leach, J. H., et al. Effect of hot phonon lifetime on electron velocity in InAlN/AlN/GaN heterostructure field effect transistors on bulk GaN substrates. Applied Physics Letters. 96 (13), 133505 (2010).
- Sasa, S., et al. Microwave performance of ZnO/ZnMgO heterostructure field effect transistors. Physica status solidi (a). 208 (2), 449-452 (2011).
- Ye, D., et al. Enhancement-mode ZnO/Mg0.5Zn0.5O HFET on Si. Journal of Physics D: Applied Physics. 47 (25), 255101 (2014).
- Koike, K., et al. Molecular beam epitaxial growth of wide bandgap ZnMgO alloy films on (111)-oriented Si substrate toward UV-detector applications. Journal of Crystal Growth. 278 (1-4), 288-292 (2005).
- Du, X., et al. Controlled Growth of High-Quality ZnO-Based Films and Fabrication of Visible-Blind and Solar-Blind Ultra-Violet Detectors. Advanced Materials. 21 (45), 4625-4630 (2009).
- Ding, K., Ullah, M., Avrutin, V., Özgür, &. #. 2. 2. 0. ;., Morkoç, H. Investigation of high density two-dimensional electron gas in Zn-polar BeMgZnO/ZnO heterostructures. Applied Physics Letters. 111 (18), 182101 (2017).
- Ding, K., Avrutin, V., Özgür, &. #. 2. 2. 0. ;., Morkoç, H. III-Nitride Light-Emitting Diodes. Wiley Encyclopedia of Electrical and Electronics Engineering. , 1-21 (2017).
- Tsukazaki, A., et al. Quantum Hall effect in polar oxide heterostructures. Science. 315 (5817), 1388-1391 (2007).
- Tsukazaki, A., et al. Observation of the fractional quantum Hall effect in an oxide. Nat Mater. 9 (11), 889-893 (2010).
- Falson, J., et al. MgZnO/ZnO heterostructures with electron mobility exceeding 1 x 10(6) cm(2)/Vs. Sci Rep. 6, 26598 (2016).
- Ullah, M. B., et al. Polarity control and residual strain in ZnO epilayers grown by molecular beam epitaxy on (0001) GaN/sapphire. physica status solidi (RRL) Rapid Research Letters. 10 (9), 682-686 (2016).
- Ullah, M. B., et al. Characterization of Ag Schottky Barriers on Be0.02Mg0.26ZnO/ZnO Heterostructures. physica status solidi (RRL) - Rapid Research Letters. , (2017).
- Lee, J. H., et al. Schottky diodes prepared with Ag, Au, or Pd contacts on a MgZnO/ZnO heterostructure. Japanese Journal of Applied Physics. 51 (9S2), 09MF07 (2012).
- Singh, R., et al. Investigation of barrier inhomogeneities and interface state density in Au/MgZnO: Ga Schottky contact. Journal of Physics D: Applied Physics. 49 (44), 445303 (2016).
- Brillson, L. J., Lu, Y. ZnO Schottky barriers and Ohmic contacts. Journal of Applied Physics. 109 (12), 121301 (2011).
- Müller, S., et al. Method of choice for fabrication of high-quality ZnO-based Schottky diodes. Journal of Applied Physics. 116 (19), 194506 (1945).
- Figge, S., Böttcher, T., Einfeldt, S., Hommel, D. In situ and ex situ evaluation of the film coalescence for GaN growth on GaN nucleation layers. Journal of Crystal Growth. 221 (1-4), 262-266 (2000).
- Han, J., Ng, T. -. B., Biefeld, R., Crawford, M., Follstaedt, D. The effect of H 2 on morphology evolution during GaN metalorganic chemical vapor deposition. Applied Physics Letters. 71 (21), 3114-3116 (1997).
- Berger, H. Models for contacts to planar devices. Solid-State Electronics. 15 (2), 145-158 (1972).
- Tampo, H., et al. Polarization-induced two-dimensional electron gases in ZnMgO/ZnO heterostructures. Applied Physics Letters. 93 (20), 202104 (2008).
- Ye, J. D., et al. Two-dimensional electron gas in Zn-polar ZnMgO/ZnO heterostructure grown by metal-organic vapor phase epitaxy. Applied Physics Letters. 97 (11), 111908 (2010).
- Šermukšnis, E., et al. Hot-electron energy relaxation time in Ga-doped ZnO films. Journal of Applied Physics. 117 (6), 065704 (2015).
- Singh, C., Agarwal, G., Rao, G. D., Chaudhary, S., Singh, R. Effect of hydrogen peroxide treatment on the electrical characteristics of Au/ZnO epitaxial Schottky diode. Materials Science in Semiconductor Processing. 14 (1), 1-4 (2011).
- Mohanta, S., et al. Electrical characterization of Schottky contacts to n-MgZnO films. Thin Solid Films. 548, 539-545 (2013).
- Schifano, R., Monakhov, E., Grossner, U., Svensson, B. Electrical characteristics of palladium Schottky contacts to hydrogen peroxide treated hydrothermally grown ZnO. Applied Physics Letters. 91 (19), 193507 (2007).
- Ip, K., et al. Improved Pt/Au and W/Pt/Au Schottky contacts on n-type ZnO using ozone cleaning. Applied Physics Letters. 84 (25), 5133-5135 (2004).
- Raju, N. R. C., Kumar, K. J., Subrahmanyam, A. Physical properties of silver oxide thin films by pulsed laser deposition: effect of oxygen pressure during growth. Journal of Physics D: Applied Physics. 42 (13), 135411 (2009).
Ristampe e Autorizzazioni
Richiedi autorizzazione per utilizzare il testo o le figure di questo articolo JoVE
Richiedi AutorizzazioneThis article has been published
Video Coming Soon