A subscription to JoVE is required to view this content. Sign in or start your free trial.
Method Article
توصيف التعديلات السطحية من التداخل الضوء الأبيض: تطبيقات في التتفيل ايون، التذرية الليزر، والتجارب علم احتكاك المفاصل
In This Article
Summary
الأبيض التداخل المجهر ضوء وسيلة بصرية، نونكونتاكت وسريعة لقياس تضاريس السطوح. يتم إثبات أنه يمكن تطبيق أسلوب تحليل نحو ارتداء الميكانيكية، حيث يتم تحليل ارتداء ندوب على عينات اختبار tribological، وعلوم المواد في تحديد أيون الاخرق شعاع الليزر التذرية أو وحدات التخزين والأعماق.
Abstract
في علوم وهندسة المواد غالبا ما يكون من الضروري الحصول على قياسات كمية لتضاريس السطح مع قرار ميكرومتر الجانبية. من سطح قياس، يمكن تحليل الخرائط الطبوغرافية 3D لاحقا باستخدام مجموعة متنوعة من حزم البرمجيات لاستخراج المعلومات اللازمة.
في هذه المادة ونحن تصف كيفية التداخل الضوء الأبيض، وprofilometry البصرية (OP) في العام، جنبا إلى جنب مع برامج التحليل سطح عامة، يمكن استخدام لعلوم المواد والهندسة المهام. في هذه المقالة، وأظهر عدد من التطبيقات من التداخل الضوء الأبيض للتحقيق من التعديلات السطحية في مطياف الكتلة، وارتداء الظواهر في علم احتكاك المفاصل والتشحيم. نحن تميز المنتجات للتفاعل من أشباه الموصلات والمعادن مع أيونات حيوية (الاخرق)، وأشعة الليزر (الاجتثاث)، وكذلك خارج الموضع قياسات للعينات اختبار ارتداء tribological. على وجه التحديد، سوف نناقش:
- جوانب التقليدية ايون الطيف الكتلي الاخرق المستندة إلى مثل معدلات الاخرق / غلة القياسات على النحاس وسي واللاحقة تحويل الوقت إلى العمق.
- نتائج توصيف الكمي لتفاعل الإشعاع مع ليزر الفيمتو ثانية على سطح أشباه الموصلات. هذه النتائج مهمة لتطبيقات مثل مطياف الكتلة الاجتثاث، حيث يمكن دراسة كميات المواد والتحكم فيها عن طريق تبخر مدة النبض والطاقة لكل والنبض. وهكذا، من خلال تحديد هندسة الحفرة يمكن للمرء تحديد عمق القرار والجانبية مقابل ظروف الإعداد التجريبية.
- قياسات المعلمات خشونة السطح في بعدين، والقياسات الكمية للارتداء السطحية التي تحدث نتيجة للاحتكاك وارتداء الاختبارات.
بعض العيوب المتأصلة، والتحف ممكن، وعدم التيقن من التقييمات الضوء الأبيضوسوف تناقش نهج التداخل وأوضح.
Introduction
سطح المواد الصلبة يحدد إلى حد كبير خصائص ذات أهمية لتلك المواد: إلكترونيا، هيكليا، وكيميائيا. في العديد من مجالات البحوث، إضافة المواد (على سبيل المثال، ترسيب طبقة رقيقة من الليزر نابض / المغنطرون الاخرق ترسب، الفيزيائية / الكيميائية ترسب بخار)، وإزالة المواد (رد الفعل ايون النقش، ايون الاخرق، الليزر التذرية، وما إلى ذلك)، أو بعض العمليات الأخرى، وتحتاج إلى أن تكون متميزة. بالإضافة إلى ذلك، تعديل السطح من خلال التفاعل مع نبضات ضوء حيوية أو الجسيمات المشحونة لديها العديد من التطبيقات، ويحتل أهمية أساسية. علم احتكاك المفاصل، ودراسة الاحتكاك وارتداء، مجالا آخر من مجالات الاهتمام. على نطاق والفوق، عدد وافر من هندستها اختبار tribological الوجود. ويمكن استخدام الاتصال هندستها غير امتثالي، ويمكن أن الكرة أو الاسطوانة أو تراجع تناوب على سطح مستو، الكرة أخرى، أو اسطوانة، وذلك لفترة من الزمن، وكمية المواد التي تتم إزالة البيانات هوasured. لأن ارتداء ندبة هو ثلاثي الأبعاد وغير منتظمة في الطبيعة، قد profilometry البصرية أن الأسلوب فقط مناسبة للحصول على قياسات دقيقة حجم التآكل. المهام المشتركة تشمل أيضا تحليل المعلمات خشونة السطح، وارتفاع الخطوة، وفقدان حجم المواد، وعمق الخندق، وهلم جرا، ويمكن الحصول كل منهم بالإضافة إلى ذلك التصور لتضاريس بسيطة 2D و 3D.
profilometry البصرية يشير إلى أي أسلوب البصرية التي يتم استخدامها لإعادة بناء الملف من السطوح. طرق Profilometric تشمل الأبيض ضوء التداخل، ليزر، أو وسائل مبائر. بعض profilometers البصرية الحصول على معلومات من خلال نهج يعتمد على الأهداف التقليدية المجهر الحيود محدودة. على سبيل المثال، قد تكون متكاملة مع ليزر المسح المجهر للحصول على المعلومات الطبوغرافية وصحيح لون السطوح. A يستخدم الأسلوب الثاني وهو الأسلوب الذي يستغل عمق قليل جدا من التركيز من الأهداف التقليدية لتجميع سيريES-من التركيز في "شرائح الصور" من سطح للحصول على الخريطة الطبوغرافية 3D.
في هذا العمل نظهر كيف يمكن لضوء التداخل الأبيض المجهر / profilometer تمكن من قياس كمية المواد التي فقدت خلال عمليات ارتداء الميكانيكية، أو أثناء عمليات الحفر المواد مثل الحفر الاخرق أيون أو الاقتلاع بالليزر. ويدفع بأكبر قدر من الاهتمام لمنهجية هذه الطريقة لتوضيح الكبير القدرة المركبة التي تجعل من نطاق واسع وجذاب للعديد من التطبيقات. معظم أنواع WLI توظيف تقنية Mirau، والذي يستخدم مرآة داخلية لهدف المجهر لحدوث تداخل بين اشارة إشارة ضوئية والضوء المنعكس من سطح العينة. وأملت اختيار التداخل Mirau من الراحة البسيطة، لأنه يمكن أن يكون لائقا للتداخل Mirau بأكمله داخل عدسة المجهر موضوعية وبالإضافة إلى المجهر الضوئي العادي (الشكل 1). سلسلة من ثنائي الأبعاد بينيتم الحصول على ferograms مع كاميرا الفيديو، والبرمجيات تجميع الخارطة الطبوغرافية 3D. مصدر الضوء الأبيض لوازم الإضاءة واسعة الطيف التي تساعد على التغلب على "النظام هامش" الغموض المتأصل في مصدر أحادي اللون. ويمكن استخدام مصدر الضوء أحادي اللون للحصول على قياس أكثر دقة من الميزات الطبوغرافية الضحلة. ويقتصر بشكل أساسي على قرار الأفقي إلى λ / 2 (الفتحة العددية، NA = 1)، ولكن في معظم الحالات أكبر، ويحدد من قبل NA الهدف، الذي هو بدوره متصلا التكبير / الميداني نظر الحجم. الجدول 1 في المرجع. 1 على المقارنة المباشرة لجميع المعلمات المذكورة. النهج القرار عمق ≈ 1 نانومتر، لكونها وظيفة لطبيعة التداخل من هذه التقنية. ويمكن الاطلاع على مزيد من المعلومات عن WLI Mirau في الحكام. 2، 3. ويمكن الاطلاع على مقدمة عن نهج الأبيض ضوء التداخل في المرجع. 4.
طرق أخرى لتحليل الأسطح هي forc الذريةالمجهر الإلكتروني (AFM)، المجهر الإلكتروني (SEM)، وprofilometry القلم. تقنية WLI يقارن ايجابيا لهذه الأساليب ومزاياه وعيوبه التي هي نتيجة لطبيعة الأسلوب البصري لل.
وAFM قادر على الحصول على الصور 3D والمقاطع العرضية وبالتالي المقابلة، ولكن لديه قدرة AFM المسح محدودة في المحاور (<10 ميكرومتر) الجانبية (<100 ميكرون) والعمق. وعلى النقيض من هؤلاء، والميزة الرئيسية لWLI هو مرنة مجال للرؤية (FOV) لمدة تصل إلى بضعة ملليمترات في وقت واحد مع القدرة الحقيقية التصوير 3D. وبالإضافة إلى ذلك، ونحن سوف تظهر لديها مجموعة واسعة المسح العمودي القدرات، مما يسمح احد ليحل العديد من المشاكل من تعديل السطح ببساطة. الباحثون الذين عملوا مع AFM على بينة من مشكلة مع المواقع الطائرة لعينة عند قياس طويلة من الميزات التدرجات العمودية منخفضة. عموما، يمكن للمرء أن يفكر في WLI / OP وتقنية "اكسبريس" على AFM. بالطبع، هناكعدد من المجالات التي AFM الوحيد هو مناسبة: عندما ميزات الجانبية إلى حل لها أبعاد أصغر من سمات القرار الوحشي للWLI، أو الحالات التي تكون فيها البيانات من WLI غامضة بسبب الخصائص البصرية مجهولة أو معقدة لعينة بطريقة يؤثر على دقة القياسات (التي ستناقش في وقت لاحق)، الخ.
وSEM هو وسيلة قوية للنظر في السطوح، ويجري مرنة للغاية من حيث حجم FOV مع عمق كبير من التركيز، وأكبر من أي المجهر الضوئي التقليدية يمكن أن تقدم. في الوقت نفسه، 3D التصوير بواسطة SEM مرهقة، خاصة وأنه يتطلب أخذ ستيريو الزوج ثم الصور التي يتم تحويلها إلى صور 3D من خلال طريقة anaglyphic، أو من خلال مراقبة مع المشاهدين البصرية، أو استخدامها لحساب مباشرة من أعماق مختلفة بين النقاط المثيرة للاهتمام على عينة .. 5 وعلى النقيض، WLI / OP profilometry يقدم سهلة الاستخدام لإعادة الإعمار 3D مع FOV مرنة في وقت واحد. WLI بمسح كامل من خلالنطاق الارتفاع اللازمة لعينة معينة (من نانومتر إلى مئات ميكرون). WLI لا يتأثر التوصيل الكهربائي للمواد العينة، والتي قد تكون مشكلة مع SEM. WLI بوضوح لا يحتاج الى فراغ. من ناحية أخرى هناك عدد من التطبيقات التي توفر معلومات متفوقة SEM: ميزات الجانبية التي يتعين حلها من أبعاد مميزة تحت القرار الوحشي للWLI، أو الحالات التي يتعذر فيها أجزاء مختلفة من عينة تميز الطوبوغرافي الثانوية فقط عندما معاملات الانبعاثات الإلكترون تختلف.
واحد أكثر تقنية لفحص السطح، والذي يستخدم على نطاق واسع في الثانوية ايون الطيف الكتلي 6 و في مجال توصيف أنظمة ميكانيكية إلكترونية صغيرة 7 هو القلم profilometry. هذا الأسلوب هو شعبية بسبب بساطته ومتانة. لأنه يقوم على المسح مباشرة الاتصال الميكانيكية من طرف القلم على سطح العينة. هذا هو أداة اتصال الخشنة، والتي هي قادرة على مسح على طول خط واحد في كل مرة. يجعل سطح 3D النقطية للمسح التصوير قتا طويلا جدا. عيب آخر من تقنية القلم هو صعوبة قياس خصائص سطح نسبة الارتفاع العالية والحجم مقارنة مع حجمه تلميح مميزة (submicron إلى عدة ميكرون عادة) التي تعني دائرة نصف قطرها نصيحة وزاوية قمة الإكراميات. ميزة من profilometry القلم هو عدم الحساسية لاختلاف الخصائص البصرية لعينة، والتي يمكن أن تؤثر على دقة WLI / OP القياسات (التي ستناقش في وقت لاحق).
تم الحصول على خرائط السطح في هذه المادة باستخدام التقليدية Mirau من نوع WLI (الشكل 1). العديد من الشركات مثل الزيجوت؛ اللاقحة، KLA-Tencor، العلوم الدقيقة، Zemetrics، Nanovea، FRT، KEYENCE، بروكر، وهوبسون تايلور إنتاج التجاري فوق المنضدة الصكوك OP. حيث أعيد تنظيم الخرائط المكتسبة ومعالجتها باستخدام البرمجيات التجارية من النوع الذي يستخدم عادة لWLI، مسح الإلكترون، سص التحقيق المجهر. البرنامج لديه القدرة على تأدية معالجات رياضية من السطح، المقطع العرضي الشخصي التحليل، باطلة والحسابات حجم المواد، وتصحيح الطائرة. قد حزم البرامج الأخرى أتمتة بعض من هذه الميزات.
Access restricted. Please log in or start a trial to view this content.
Protocol
1. محاذاة الأجهزة لعام WLI المسح الضوئي
للحصول على معلومات كمية عن طريق WLI، قد الخطوات التالية بمثابة خطوط عريضة. فمن المفترض أن لديه معرفة المشغل الأساسية للعملية تداخل. المبادئ التوجيهية شائعة بغض النظر عن أداة محددة. بالنسبة لبعض التحقيقات، وسوف تكون مسطحة العينة. بالنسبة للآخرين، قد يكون منحني العينة.
- وضع العينة على المسرح مع ميزة (أيون باءت بالفشل الحفرة، شعاع أيون / بقعة ذاب، أو ارتداء ندبة) مواجهة مباشرة. استخدام الهدف منخفضة التكبير والتركيز الصك على ذلك. للحصول على أفضل صورة قرار الحصول فيها موضع اهتمام إلى حد كبير يملأ الشاشة، انظر الشكل 2 للحصول على مثال الكرة.
- ضبط الوضع الرأسي للعينة بحيث تظهر هامش التدخل بالقرب من سمة من سمات الفائدة. لسطح مستو من المستحسن أن يتم إمالة العينة بحيث الطائرة perpendiculع إلى المحور البصري، أي تباعد هامش ستكون كبيرة. لسطح منحن (مثل الكرة)، ينبغي أن يكون موجها العينة تقع مركزيا بحيث هامش حول هذه الميزة، كما هو الحال في الشكل 3.
- الحصول على فحص وفقا للتعليمات الصك. قد يكون من الضروري لضبط ارتفاع الإضاءة أو المسح الضوئي من أجل الحصول على أفضل الخريطة الطبوغرافية. تعبئة أي بيانات تالفة أو مفقودة باستخدام وظيفة أقحم، ثم قم بحفظ الخريطة الطبوغرافية.
2. تحليل حجم استخدام البرمجيات عام
في علم احتكاك المفاصل، وآلات الاختبار غالبا ما توظف غير امتثالي هندستها اختبار الاتصال مثل الكرة أو الاسطوانة على أن تراجع أو استدارة ضد اسطوانة شقة أو آخر. عادة، يتم فقدان المواد في نقطة الاتصال انزلاق، على الرغم من المواد في بعض الأحيان قد نقل من سطح واحد إلى آخر، وسيتم قياس هذا "طبقة النقل" كما وجود فائض من المواد على على(ه) من العينات الاتصال. لأن ارتداء ندبة هو ثلاثي الأبعاد وغير منتظمة في الطبيعة، قد profilometry البصرية أن الأسلوب فقط مناسبة للحصول على قياسات دقيقة حجم ارتداء - تقريبية غير صالحة. والهدف من ذلك هو قياس كميات صغيرة جدا من المواد التي قد يتم فقدان (أو المكتسبة) في المنطقة الاتصال عند الانتهاء من الاختبار.
المبدأ الأساسي للقياس هي تحديد طائرة رياضية على مستوى سطح دون عائق: السطحية برامج التحليل يفترض أن هناك "سطح صلب" (مستوى الصفر)، أي أعلى من هذا المستوى هو "فارغة". وسيعرض وظيفة التحليل الذي يقيس حجم المتكاملة إزالة أدناه الطائرة من "سطح صلب" إلى "حجم الفراغ." وسيتم استدعاء الدالة الذي يقيس حجم المتكاملة فوق الطائرة من "سطح صلب" (مثل تراكم الحطام) في "حجم المواد."
دون عائق حقيقي ع السطوحه نادرا السلس تماما ومسطحة. لأعظم دقة في قياس الميزات الصغيرة فمن الممارسة السليمة لتحديد مساحة من الاهتمام (AOI)؛ يتم استبعاد خارج المنطقة التي من التحليل. يتم استخدام AOI لتقييد منطقة القياس بسبب مخالفات في سطح المساهمة الحجم الإضافي لحسابات غير حقيقية من المنطقة المضطربة.
3. شقة السطح - تحليل الميكانيكية ملابس
- تحليل حجم سطح مستو مع ندبة الخندق أو الاكتئاب، سواء الناتجة عن ارتداء الميكانيكية، ايون الاخرق شعاع، أو التذرية الليزر، من السهل القيام به. الحصول على صورة مثل اليسار 4 الشكل الذي يظهر ندبة الميكانيكية على سطح الفولاذ المصقول. تحديد AOI يستبعد الاكتئاب ومن ثم استخدام كل ما الخيمة و / أو انحناء ظيفة إزالة متاح للمستوى سطح دون عائق إلى التسطيح أقصى. ثم استخدام البرنامج لضبط ارتفاع متوسط سطح ل= Z0. الشكل 4 هو حق وجهة نظر pseudocolor من ندبة على سطح مستو بعد هذه الخطوات. في طريقة العرض هذه لالمستبعدة "حجم الفراغ" وملون باللون الأحمر. في هذا المخطط اللون، والبني الداكن يدل على المناطق المنخفضة، في حين يدل اللون البرتقالي المناطق المرتفعة.
- حذف AOI. إذا كان البرنامج يحتوي على وظيفة قياس حجم الآلي، وضع المنطقة من خلال قياس ندبة. في هذا البرنامج، وسوف رصيده وظيفة قياس "باطلة وحجم المواد" تظهر مع لون أزرق في الشكل 5. ارتداء مجموع "حجم المواد" فوق الطائرة تطرح من "حجم الفراغ." هذا هو التغيير حجم سطح بالانزعاج. (بالنسبة للبرامج التي ليس لديها هذه الوظيفة، لكن لديه رسم بياني، أو لتصور بوضوح المجالات التي تثار فوق السطح أو تحت السطح هي، تخطي الخطوة 3.2 و انتقل إلى الخطوة 3.3.)
الخطوات الثلاث التالية تصف أسلوب بديل لقياس حجم التآكل.
- وعكس AOIمن الخطوة 3.1 إلى تمكين ليتم تحليلها المنطقة ندبة (يتم تضمين ندبة الآن).
- إنشاء المدرج التكراري للبيانات. الرسم البياني هو الرسم البياني من الارتفاع العمودي على الإحداثي السيني مقابل تواتر حدوث المنسقة على. مكان واحد المؤشر في الموضع Z 0 = (الشكل 6 اليسار). هذا قد لا يكون في ذروة الرسم البياني. في هذا الرقم تم تعيين ما يصل إلى تحليل المؤشرات بشكل انتقائي فقط المواد المفقودين تحت الطائرة. البرنامج يدمج بين الحجم الكلي المؤشرات اثنين. المنطقة الحمراء ملون يظهر ما تم حذفها. المناطق البرتقالي في الشكل 6 untinted على حق تحت السطح. ينبغي أن ظيفة الرسم البياني إنشاء "حجم الفراغ" مع عدد المؤشرات في وضع كما هو موضح لقياس المواد المفقودة من السطح.
- باستخدام الرسم البياني نفسه، ضع المؤشر أخرى هذه المرة في موقف = Z ارتفاع 0 (الشكل 7 اليسار)، والآخر في الطرف المقابل. المناطق البرتقال في untinted الشكل 7 الحق هي فوق السطح. أثار أي فائض المواد وظيفة الرسم البياني يجب إنشاء "حجم المواد" عدد، وفوق سطح مستو. ارتداء مجموع "حجم المواد" تطرح من "حجم الفراغ"، ونفس كما في الخطوة 3.2. يجب أن الأسلوب يعطي الرسم البياني حجم ارتداء نفس كما في الخطوة 3.2، ولكنه يوفر تفاصيل إضافية حول توزيع المواد المطروحة وخفضت، ويظهر خريطة للتوزيع هذا المجال.
في المثال أعلاه عدم وجود المواد المفقودة من صافي ندبة الملابس، وبدلا من ذلك هناك مكاسب مادية. هذا أمر غير معتاد، ولكن يحدث في بعض الأحيان عندما نقل من نقل المواد counterface اختبار واحد إلى آخر.
نفس "توصيف سطح مستو" النهج هي مفيدة للحصول على وحدات التخزين في التجارب مع إزالة أيون الاخرق والليزر التذرية، نظرت في الأمثلة التالية.
4. شقة السطح - الحفر وايون برو الحزمةملفات القياسات لتقدير إنتاجية الاخرق، وأداء الوقت للوصول الى عمق المعايرة
كبديل للطريقة معروفة على نطاق واسع والمستخدمة لتقدير غلة الاخرق باستخدام الأسلوب الشامل للخسارة، على أساس وزنها مباشرة أو الكوارتز بلورة مكروية التوازن و 8 و 9 نجد أن أسلوب WLI مفيد لرؤية مباشرة للبقع باءت بالفشل شعاع أيون / الحفر التي حصلت عليها الاخرق ثابت / النقطية المسح الضوئي للشعاع شخصية. أيون 8 يقارن المقاطع العرضية الطولية من بقعة (الخطوط المنقطة الخضراء الصلبة والأزرق) لأحداث 5 كيلو عادة ثابتة و 150 فولت + صول الحزم الأيونية ضد الحفر الخاصة بهم (الزيتون المفتوحة دوائر والماس سماوي مفتوح) التي حصلت عليها 100 × 100 بكسل الرقمية المسح النقطية من شعاع أيون نفسه مرارا سطح النحاس (110) الكريستال واحد. منحنى المقابلة لشعاع التداخل ثابت حافة واحدة من فوهة البركان لشرح كيفية مسح النقطية من شعاع أيون يولد الحفرة خلال تفل دepth التنميط.
5. شقة السطح - توصيف تذرية الليزر فائق السرعة
ومن المسلم به الليزر فائق السرعة الاجتثاث كوسيلة لإزالة المواد الصلبة من منطقة مع التقليل من الحرارة تتأثر. 10 هذا العملية يمكن عالية متناهي الصغر مع معدل نسب عالية وأضرار طفيفة (تكسير، والأكسدة) إلى المواد المتبقية، ويفتح إمكانية الاجتثاث كفاءة المواد الشفافة. 11 المزيد من قريب، وقد وضعت مصلحة في استخدام الاجتثاث فائق السرعة كأداة تحليلية. 12-15 واستقامة عالية من عملية الاجتثاث كما يوفر وسيلة لتقليل حجم البقعة ذاب أقل بكثير من حجم البقعة المشع ( كما هو محدد عادة عن طريق البريد / 1 2) وحتى أقل من الحد الحيود، وقد ثبت عن 16 قرار العمق، في حين لا تنافسية مع أفضل الأساليب أيون شعاع، قد يكون <20 نانومتر. يمكن بسهولة زيادة معدلات إزالةnonlinearly عن طريق زيادة فلوينس الليزر، لذلك أن التنميط السريع جدا من خلال ميكرون من مادة أمر ممكن. ومن الناحية المثالية، التي تميز إزالة المواد من الاجتثاث فائق السرعة يتطلب تقنية سريعة والكمية ومعايرة حسنا، كل الخصائص تفي بها WLI.
ويبين الشكل 9 صور pseudocolor اثنين من الحفر المجاورة التي شكلتها الاجتثاث المتكررة من الغاليوم مع فائق السرعة (60 FS، 800 نانومتر) شعاع الليزر يركز على حجم البقعة من 8 ميكرومتر و≈. وجود fluences الموافق 0.4 و 1.0 2 J / سم
6. منحني السطوح - ميكانيكية التحليل ملابس
تحليل حجم سطح منحني العادية (الكرة أو الاسطوانة) مماثلة لتلك التي على شقة، ولكنها تتطلب إزالة انحناء. البروتوكول التالي يوضح تحليلا للندبة دائرية على ارتداء الكرة الحديد. العثور على المفقودة من حجم الكرة لا بد من القيام به لتحويل تجهيز الرياضية الكرة معمساحة الشقة إلى شقة الطائرة مع المسافة البادئة، ثم قياس حجم المسافة البادئة كما حدث في القسم 3 على الأسطح المسطحة. وسوف يقاس A ندبة على ارتداء الكرة، وذلك باستخدام تقنية أبسط أولا التلقائي، ثم مع تقنية الرسم البياني.
- الشكل 10 يبين وجهة نظر اليسار متساوي القياس من ندبة على ارتداء الكرة. تحديد AOI يستبعد ارتداء ندبة، وحدد أداة منحنى المناسب البرمجيات التي ستحول سطح بحيث يكون الاكتئاب البالية في وسط منطقة على شقة دون عائق. لأن إزالة انحناء قد تكون تقنية التكرار قد يكون من الضروري لتشغيل عدة مرات بحيث تناسب المنطقة دون عائق إلى مسطح نانومتر دقة المستوى. أي غير مرئية التوحيد خارج ندبة ارتداء يشير إلى مشكلة وحساب لن يكون صحيحا. تعيين ارتفاع متوسط خارج ندبة إلى Z = 0. الشكل 10 يظهر الحق على عرض pseudocolor للندبة بعد إزالة انحناء والإعداد Z = 0 مع AOI بشكل صحيحاخفاء منطقة البالية.
- استخدام أداة القياس، إن وجدت، لتحليل الملابس، كما هو مبين في الشكل 11. اجمالى حجم ارتداء هو "حجم المواد" تطرح من "حجم الفراغ."
تصف الخطوات التالية طريقة بديلة لقياس حجم التآكل.
- في بنفس الطريقة الخطوة 3.3، عكس لAOI بحيث يتم تضمين ندبة ارتداء. إنشاء المدرج التكراري للبيانات. مكان واحد المؤشر في الموضع Z 0 = (الشكل 12 يسار). المناطق البرتقال untinted في الشكل 12 على حق تحت السطح. ينبغي أن ظيفة الرسم البياني إنشاء "حجم الفراغ" عدد.
- باستخدام الرسم البياني نفسه، ضع المؤشر أخرى هذه المرة في موقف = Z ارتفاع 0 (اليسار الشكل 13)، والآخر في الطرف المقابل. المناطق البرتقال untinted في الشكل 13 على حق فوق السطح. ينبغي أن ظيفة الرسم البياني إنشاء "حجم المواد" عدد. مجموعارتداء حجم هو "حجم المواد" فوق الطائرة تطرح من "حجم الفراغ"، ونفس كما في الخطوة 3.2. يجب أن الأسلوب الرسم البياني حساب حجم ارتداء نفس كما في الخطوة 6.2، ولكنه يوفر تفاصيل إضافية حول توزيع المواد المطروحة وخفضت، ويظهر خريطة للتوزيع هذا المجال.
Access restricted. Please log in or start a trial to view this content.
النتائج
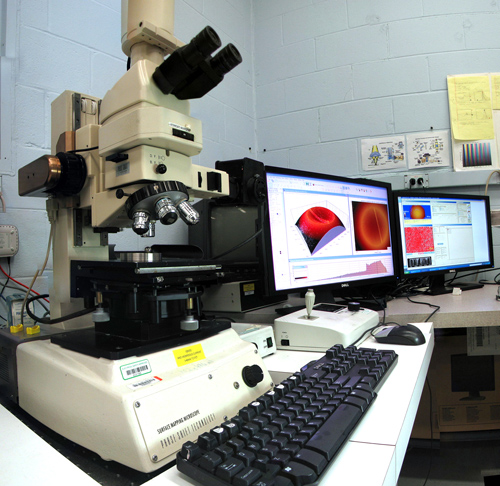
الشكل 1 صورة لprofilometer البسيطة المستخدمة في هذه الدراسة: يعتبر برج الهدف متعددة في الصورة. هدفين هي المعيار (10X 50X و)، وهما أهداف Mirau (10X 50X و). هذا المجهر لديه ميزة التكبير وسيطة تمكن مضاعفا...
Access restricted. Please log in or start a trial to view this content.
Discussion
مثال 1
لا WLI على نطاق واسع لتوصيف سطح العمل في tribological، ولكن هو في الواقع وسيلة قوية لقياس كمي لحجم ارتداء لهندستها اتصال عديدة. WLI تنتج التمثيل الكامل 3D لسطح يمكن تحليلها باستخدام أي من العديد من حزم البرامج التصور. هذه الحزم تمكن من ?...
Access restricted. Please log in or start a trial to view this content.
Disclosures
الإعلان عن أي تضارب في المصالح.
Acknowledgements
وقدمت العينة الغاليوم المشع من قبل تسوى يانغ من جامعة إلينوي في شيكاغو. وأيد هذا العمل بموجب العقد رقم DE-AC02-06CH11357 بين أرجون UChicago، LLC وزارة الطاقة الأمريكية ووكالة ناسا من خلال المنح وNNH08AH761 NNH08ZDA001N، ومكتب للتكنولوجيا مركبة للوزارة الطاقة الأميركية بموجب عقد DE-AC02 -06CH11357. تم انجازه في المجهر الإلكتروني في مركز المجهر الإلكتروني لأبحاث المواد في مختبر أرغون الوطني، وزارة الطاقة مكتب العلوم المختبرية، وتعمل تحت العقد DE-AC02-06CH11357 بواسطة أرجون UChicago، LLC.
Access restricted. Please log in or start a trial to view this content.
Materials
| Name | Company | Catalog Number | Comments |
| واحدة من ركائز الكريستال سي، الغاليوم والنحاس | لالاخرق والاجتثاث | ||
| السبائك المعدنية النقية | للحصول على أمثلة علم احتكاك المفاصل |
References
- Gao, F., Leach, R. K., Petzing, J., Coupland, J. M. Surface measurement errors using commercial scanning white light interferometers. Meas. Sci. Technol. 19, 015303(2008).
- Cheng, Y. -Y., Wyant, J. C. Multiple-wavelength phase-shifting interferometry. Appl. Opt. 24, 804-807 (1985).
- Kino, G. S., Chim, S. S. C. Mirau correlation microscope. Appl. Opt. 29, 3775-3783 (1990).
- Wyant, J. C. White light interferometry. Proc. SPIE. 4737, 98-107 (2002).
- Sakseev, D. A., Ershenko, E. M., Baryshev, S. V., Bobyl, A. V., Agafonov, D. V. Deep microrelief measurement and stereo photography in scanning electron microscopy. Tech. Phys. 56, 127-131 (2011).
- Morris, R. J. H., Dowsett, M. G. Ion yields and erosion rates for Si1-xGex (0≤x≤1) ultralow energy O2+ secondary ion mass spectrometry in the energy range of 0.25-1 keV. J. Appl. Phys. 105, 114316(2009).
- O'Mahony, C., Hill, M., Brunet, M., Duane, R., Mathewson, A. Characterization of micromechanical structures using white-light interferometry. Meas. Sci. Technol. 14, 1807-1814 (2003).
- Andersen, H. H., Bay, H. L. Sputtering yield measurements. Topics in Applied Physics. Behrisch, R. 47: Sputtering by Particle Bombardment, Springer-Verlag. Berlin, Heidelberg. 145-218 (1981).
- Wu, S. -M., de Kruijs, R. van, Zoethout, E., Bijkerk, F. Sputtering yields of Ru, Mo, and Si under low energy Ar+ bombardment. J. Appl. Phys. 106, 054902(2009).
- Liu, X., Du, D., Mourou, G. Laser ablation and micromachining with ultrashort laser pulses. IEEE J. Quantum Electron. 33, 1706-1716 (1997).
- Gattass, R. R., Mazur, E. Femtosecond laser micromachining in transparent materials. Nature Photonics. 2, 219-225 (2008).
- Russo, R. E., Mao, X., Gonzalez, J. J., Mao, S. S. Femtosecond laser ablation. ICP-MS. J. Anal. At. Spectrom. 17, 1072-1075 (2002).
- Brady, J. J., Judge, E. J., Levis, R. J. Analysis of amphiphilic lipids and hydrophobic proteins using nonresonant femtosecond laser vaporization with electrospray post-ionization. J. Am. Soc. Mass Spectrom. 22, 762-772 (2011).
- Berry, J. I., Sun, S., Dou, Y., Wucher, A., Winograd, N. Laser desorption and imaging of proteins from ice via UV femtosecond laser pulses. Anal. Chem. 75, 5146-5151 (2003).
- Coello, Y., Jones, A. D., Gunaratne, T. C., Dantus, M. Atmospheric pressure femtosecond laser imaging mass spectrometry. Anal. Chem. 82, 2753-2758 (2010).
- Korte, F., Serbin, J., Koch, J., Egbert, A., Fallnich, C., Ostendorf, A., Chichkov, B. N. Towards nanostructuring with femtosecond laser pulses. Appl. Phys. A. 77, 229-235 (2003).
- Fu, Y., Bryan, N. K. A., Shing, O. N., Wyan, H. N. P. Influence analysis of dwell time on focused ion beam micromachining in silicon. Sensors and Actuators A. 79, 230-234 (2000).
- Jiang, F., Li, J., Yan, L., Sun, J., Zhang, S. Optimizing end-milling parameters for surface roughness under different cooling/lubrication conditions. Int. J. Adv. Manuf. Technol. 51, 841-851 (2010).
- Reiter, A. E., Mitterer, C., Figueiredo, M. R., Franz, R. Abrasive and adhesive wear behavior of arc-evaporated Al1-xCrxN hard coatings. Tribol. Lett. 37, 605-611 (2010).
- Devillez, A., Lesko, S., Mozer, W. Cutting tool crater wear measurement with white light interferometry. Wear. 256, 56-65 (2004).
- Shekhawat, V. K., Laurent, M. P., Muehleman, C., Wimmer, M. A. Surface topography of viable articular cartilage measured with scanning white light interferometry. Osteoarthritis and Cartilage. 17, 1197-1203 (2009).
- Hershberger, J., Öztürk, O., Ajayi, O. O., Woodford, J. B., Erdemir, A., Erck, R. A., Fenske, G. R. Evaluation of DLC coatings for spark-ignited, direct-injected fuel systems. Surf. Coat. Technol. 179, 237-244 (2004).
- Ajayi, O. O., Erck, R. A., Lorenzo-Martin, C., Fenske, G. R. Frictional anisotropy under boundary lubrication: Effect of surface texture. Wear. 267, 1214-1219 (2009).
- Wittmaack, K. Analytical description of the sputtering yields of silicon bombarded with normally incident ions. Phys. Rev. B. 68, 235211-23 (2003).
- Zeuner, M., Neumann, H., Scholze, F., Flamm, D., Tartz, M., Bigl, F. Characterization of a modular broad beam ion source. Plasma Sources Sci. Technol. 7, 252-267 (1998).
- Barna, A., Menyhard, M., Kotis, L., Kovacs, G. J., Radnoczi, G., Zalar, A., Panjan, P. Unexpectedly high sputtering yield of carbon at grazing angle of incidence ion bombardment. J. Appl. Phys. 98, 024901(2005).
- Weck, A., Crawford, T. H. R., Wilkinson, D. S., Haugen, H. K., Preston, J. S. Laser drilling of high aspect ratio holes in copper with femtosecond, picosecond and nanosecond pulses. Appl. Phys. A. 90, 537-543 (2008).
- Roosendaal, H. E. Sputtering yields of single crystalline targets. Topics in Applied Physics. ed, I. .,B. ehrisch,R. ., 47: Sputtering by Particle Bombardment, Springer-Verlag. Berlin, Heidelberg. 219-256 (1981).
- Seah, M. P. An accurate semi-empirical equation for sputtering yields II: For neon, argon and xenon ions. Nucl. Instrum. Methods Phys. Res. B. 229, 348-358 (2005).
- Seah, M. P., Clifford, C. A., Green, F. M., Gilmore, I. S. An accurate semi-empirical equation for sputtering yields I: For argon ions. Surf. Interface Anal. 37, 444-458 (2005).
- James Ziegler - SRIM & TRIM [Internet]. , Available from: http://www.srim.org/ (2011).
- Moller, W., Eckstein, W. Tridyn - A TRIM simulation code including dynamic composition changes. Nucl. Instrum. Methods Phys. Res. B. 2, 814-818 (1984).
- Insepov, Z., Norem, J., Veitzer, S. Atomistic self-sputtering mechanisms of rf breakdown in high-gradient linacs. Nucl. Instrum. Methods Phys. Res. B. 268, 642-650 (2010).
- Puech, L., Dubarry, C., Ravel, G., de Vito, E. Modeling of iron oxide deposition by reactive ion beam sputtering. J. Appl. Phys. 107, 054908(2010).
- Ho, S., Tamakoshi, T., Ikeda, M., Mikami, Y., Suzuki, K. Net sputtering rate due to hot ions in a Ne-Xe discharge gas bombarding an MgO layer. J. Appl. Phys. 109, 084908(2011).
- Nakles, M. R. Experimental and Modeling Studies of Low-Energy Ion Sputtering for Ion Thrusters [dissertation]. , Virginia Polytechnic Institute and State University. 1-129 (1988).
- Hada, M., Ninomiya, S., Seki, T., Aoki, T., Matsuo, J. Using ellipsometry for the evaluation of surface damage and sputtering yield in organic films with irradiation of argon cluster ion beams. Surf. Interface Anal. 43, 84-87 (2011).
- Kozole, J., Wucher, A., Winograd, N. Energy deposition during molecular depth profiling experiments with cluster ion beams. Anal. Chem. 80, 5293-5301 (2008).
- Linde, D. vonder, Sokolowski-Tinten, K. The physical mechanisms of short-pulse laser ablation. Appl. Surf. Sci. 154-155, 1-10 (2000).
- Margetic, V., Bolshov, M., Stockhaus, A., Niemax, K., Hergenroder, R. Depth profiling of multi-layer samples using femtosecond laser ablation. J. Anal. At. Spectrom. 16, 616-621 (2001).
- Cui, Y., Moore, J. F., Milasinovic, S., Liu, Y., Gordon, R. J., Hanley, L. Depth profiling and imaging capabilities of an ultrashort pulse laser ablation time of flight mass spectrometer. Rev. Sci. Instrum. 83, 093702(2012).
- Borowiec, A., MacKenzie, M., Weatherly, G. C., Haugen, H. K. Femtosecond laser pulse ablation of GaAs and InP: Studies utilizing scanning and transmission electron microscopy. Appl. Phys. A. 77, 411-417 (2003).
- Harasaki, A., Schmit, J., Wyant, J. C. Offset of coherent envelope position due to phase change on reflection. Appl. Opt. 40, 2102-2106 (2001).
- Luttge, A., Arvidson, R. S. Reactions at surfaces: A new approach integrating interferometry and kinetic simulations. J. Am. Ceram. Soc. 93, 3519-3530 (2010).
- Conroy, M., Mansfield, D. Scanning interferometry: Measuring microscale devices. Nature Photonics. 2, 661-663 (2008).
- Harasaki, A., Wyant, J. C. Fringe modulation skewing effect in white-light vertical scanning interferometry. Appl. Opt. 39, 2101-2106 (2000).
- Roy, M., Schmit, J., Hariharan, P. White-light interference microscopy: Minimization of spurious diffraction effects by geometric phase-shifting. Opt. Express. 17, 4495-4499 (2009).
Access restricted. Please log in or start a trial to view this content.
Reprints and Permissions
Request permission to reuse the text or figures of this JoVE article
Request PermissionExplore More Articles
This article has been published
Video Coming Soon
Copyright © 2025 MyJoVE Corporation. All rights reserved