Для просмотра этого контента требуется подписка на Jove Войдите в систему или начните бесплатную пробную версию.
Method Article
Характеристика модификации поверхности белым светом интерферометрии, применения в ионного распыления, лазерной абляции, и трибологии Эксперименты
В этой статье
Резюме
Белый свет интерферометрии микроскоп оптический, бесконтактный и быстрый способ для измерения топографии поверхности. Показано, как метод может быть применен к анализу механического износа, где носят шрамы на трибологических тестовые образцы анализируются, и в материаловедении для определения ионного пучка распыления или лазерной абляции объемов и глубины.
Аннотация
В материалах науки и техники часто возникает необходимость получить количественные измерения топографии поверхности с пространственным разрешением микрометра. Из измеряемой поверхности, 3D-топографических картах может быть в дальнейшем проанализированы с использованием различных программных пакетов для извлечения информации, которая необходима.
В этой статье мы расскажем, как белый свет интерферометрии, оптической профилометрии (ОП) в целом, в сочетании с общим программного обеспечения для анализа поверхности, могут быть использованы для материаловедения и инженерных задач. В этой статье, число заявок белого света интерферометрии для исследования поверхностных изменений в масс-спектрометрии, и носить явлений в трибологии и смазки продемонстрировали. Мы характеризуем продуктов взаимодействия полупроводников и металлов с энергичными ионами (распыление), и лазерного облучения (абляции), а также бывшие полевые измерения износа трибологических образцов. В частности, мы обсудим:
- Аспекты традиционной ионного распыления на основе масс-спектрометрии, таких как распыление цены / выходы измерений на Si и Cu и последующее время-глубина преобразования.
- Результаты количественной характеристики взаимодействия фемтосекундного лазерного излучения с поверхности полупроводника. Эти результаты важны для приложений, таких как удаление масс-спектрометрии, где количество испарившейся материал может быть изучен и управляется через длительность импульса и энергии в импульсе. Таким образом, определив кратера геометрии можно определить глубину и пространственным разрешением по сравнению с экспериментальными условиями установки.
- Измерение параметров шероховатости поверхности в двух измерениях, и количественные измерения износа поверхности, которые возникают в результате трения и износа испытаний.
Некоторые присущи недостатки, возможные артефакты, а также неопределенность оценки белый светинтерферометрии подход будет обсуждаться и объяснил.
Введение
Поверхности твердых материалов определяется в значительной степени свойства, представляющие интерес для этих материалов: в электронном виде, структурно и химически. Во многих областях исследований, добавление материала (например, осаждения тонких пленок импульсным лазерным / магнетронного распыления осаждением, физическое / химическое осаждение паров), удаление материала (реактивного ионного травления, ионного напыления, лазерной абляции, и т.д.), или других процессов, должны быть охарактеризованы. Кроме того, модификация поверхности на основе взаимодействия с энергичными импульсами света или заряженных частиц имеет многочисленные приложения и представляет фундаментальный интерес. Трибологии, изучение трения и износа, является еще одной областью интересов. По шкале настольные, множество трибологических геометрии теста существует. Non-конформной геометрии контакта может быть использована, и шар или цилиндр могут быть сдвинуты или повернуты на плоской поверхности, другой шар или цилиндр, на продолжительное время, и количество материала, который удаляется это яasured. Из-за износа шрам трехмерных и нерегулярный характер, оптический профилометрии может быть только технику, пригодных для получения точных измерений объема износа. Общие задачи анализа включают в себя также параметров шероховатости поверхности, высота ступеней, потеря объема материала, глубина траншеи, и так далее, и все из них могут быть получены дополнительно к простой 2D-и 3D-визуализации рельефа.
Оптический профилометрии относится к любым оптическим методом, который используется для восстановления профиля поверхности. Profilometric методы включают в себя белую интерферометрических свет, лазер, или конфокальной методами. Некоторые оптические профилометров получения информации через подходы, основанные на обычных дифракционной микроскопии целей. Например, сканирующий лазерный может быть интегрирована с микроскопом, чтобы получить топографические и истинной информации о цвете поверхности. Второй метод использует технику, которая использует чрезвычайно малую глубину резкости обычных целей собрать серьезх годов в фокусе "образ кусочки» поверхности для получения 3D-топографической карте.
В этой работе мы покажем, как белый свет интерферометрической микроскопии / профилометра позволяет измерять количество материала, потерял во время механических процессов износа, или во время травления материалов процессами, такими как ионом кратера распыления или лазерной абляции. Наибольшее внимание уделяется методологии этого метода, чтобы проиллюстрировать его большой установленной мощности, что делает его доступным и привлекательным для многочисленных приложений. Большинство видов WLI использовать метод Mirau, который использует зеркала внутри объектива микроскопа, чтобы вызвать помехи между опорным сигналом света и света, отраженного от поверхности образца. Выбор Mirau интерферометрии диктуется простым удобством, так как весь интерферометр Mirau может поместиться внутри объектива микроскопа и связанной с обычной оптической микроскопии (рис. 1). Серия двумерных междуferograms приобретаются с видеокамерой и программное обеспечение собирает 3D-топографической карте. Источник белого света поставляет широкую освещенность спектра, которая помогает преодолеть "бахрома порядка" неопределенность присуща монохроматического источника. Монохроматического источника света может быть использована для получения более точного измерения мелких топографических особенностей. Пространственным разрешением, принципиально ограничены λ / 2 (числовой апертуры, NA = 1), но в большинстве случаев больше, определяется по NA объектива, который в свою очередь связан с увеличением / поля-обзора размера. Таблица 1 в работе. 1 имеет прямое сравнение всех указанных параметров. Глубина подходы разрешение ≈ 1 нм, является функцией интерферометрического характер техники. Более подробную информацию о Mirau WLI можно найти в работах. 2, 3. Внедрение на белом свете интерферометрических подхода можно найти в работе. 4.
Другие методы анализа поверхности атомная НЦВОэлектронной микроскопии (АСМ), сканирующей электронной микроскопии (SEM), и стилусом профилометрии. Техника WLI выгодно отличается от этих методов и имеет свои преимущества и недостатки, которые связаны с оптическими характер метода.
AFM способна получения 3D-изображения и, следовательно, соответствующие сечениям, но AFM имеет ограниченную способность сканирования в боковом (<100 мкм) и глубиной (<10 мкм) осями. В отличие от тех, основное преимущество WLI является гибкая поля зрения (FOV) до нескольких миллиметров с одновременным реальные возможности визуализации 3D. Кроме того, как мы покажем это имеет широкую вертикальную емкость диапазон сканирования, позволяющий решать самые разнообразные проблемы модификации поверхности просто. Исследователи, которые работали с AFM были осведомлены о проблеме с самолетом позиционирования образца при измерении длительной особенности низкой вертикальные градиенты. Вообще, можно думать о WLI / OP как "экспресс" Техника над AFM. Конечно, естьряд областей, на которые нужен только AFM подходит: при боковом функций, которые будут решены имеют характерные размеры которых меньше боковой разрешение WLI, или случаи, когда данные из WLI неоднозначно из-за неизвестных или сложных оптических свойств образца таким образом, что влияет на точность измерений (которые будут обсуждаться позже), и т.д.
SEM является мощным средством, чтобы смотреть на поверхность, будучи очень гибким с точки зрения размера FOV с большой глубиной резкости, больше, чем любой обычный оптический микроскоп может предложить. В то же время, 3D-визуализация с помощью СЭМ является громоздким, особенно, как это требует принятия стерео-пары изображений, которые затем будут преобразованы в 3D-изображений методом анаглифические, либо путем наблюдения с оптическими зрителей, или использоваться для прямого расчета глубины между различными достопримечательности на образце 5. Напротив, WLI / OP профилометрии предлагает простые в использовании 3D-реконструкция с одновременной гибкой FOV. WLI сканирует полныйВысота диапазона, необходимого для конкретного образца (от нанометров до сотен микрон). WLI не влияет на электропроводность образца материала, который может быть проблема с SEM. WLI, очевидно, не требующих вакуума. С другой стороны, есть ряд приложений, для которых SEM обеспечивает превосходную информацию: боковые функций, которые будут решены в характерные размеры ниже боковой разрешение WLI, или случаи, когда различные части образца может быть топографически отличается только тогда, когда вторичных электронов коэффициентов выбросов различаться.
Еще одна техника для поверхностного осмотра, который широко используется в вторичной ионной масс-спектрометрии 6 и в области микроэлектромеханических систем характеристика 7 является стилус профилометрии. Эта техника пользуется популярностью из-за своей простоты и надежности. Он основан на прямом механическим сканированием контакт наконечника пера над поверхностью образца. Это является грубым инструментом контакта, Который способен сканировать по одной линии одновременно. Это делает 3D-поверхности растрового сканирования изображений очень много времени. Еще один недостаток техники стилус трудности измерения поверхностных свойств высокой пропорции и размеры, сравнимые с характерным размером наконечник (субмикронных до нескольких микрон обычно), что подразумевает радиус наконечника и угол кончика иглы. Преимущество стилуса профилометрии является его нечувствительность к различным оптическим свойствам образца, которые могут повлиять на точность WLI / OP измерений (которые будут обсуждаться позже).
Поверхность карты в настоящей статье, были получены с использованием обычных Mirau типа WLI (рис. 1). Многие компании, такие как Zygo, KLA-Tencor, нанотехнологии, Zemetrics, Nanovea, FRT, Keyence, Bruker, и Тейлор Хобсон производить коммерческие настольные OP инструментов. Полученные карты были реконструированы и обрабатывается с использованием коммерческого программного обеспечения типа, который обычно используется для WLI, сканирующий электронный, оГ зондовой микроскопии. Программное обеспечение имеет возможность выполнять математические манипуляции с поверхности, сечение профиля анализ, пустота и расчет объема материала, и плоскости коррекции. Другие пакеты программного обеспечения могут автоматизировать некоторые из этих функций.
Access restricted. Please log in or start a trial to view this content.
протокол
1. Оборудование для выравнивания Генеральный WLI Scan
Для получения количественной информации через WLI, следующие шаги могут служить в качестве ориентира. Предполагается, что оператор имеет базовые знания интерферометра операции. Эти руководящие принципы являются общими, независимо от конкретного инструмента. Для некоторых исследований, образец будет плоским. Для других образцов может быть изогнут.
- Поместите образец на сцене с помощью функции (ионного распыления кратера, ионного пучка / удаленной пятна, или пятна износа), обращенной вверх. Использование низкого увеличения цель и сосредоточиться на ней инструмент. Для получения наилучшего разрешения изображения, в котором объектом интереса в значительной степени заполняет экран, см. рис 2 для примера мяч.
- Отрегулируйте вертикальное положение образца, так что интерференционных полос появляются рядом с особенностью интереса. Для плоской поверхности желательно, чтобы образца наклонена так, что плоскость perpendiculар к оптической оси, то есть бахрома расстояние будет большим. Для криволинейной поверхности (например, мяч), образец должен быть ориентирован так, что полосы расположены в центре города вокруг функции, например, на рисунке 3.
- Получить проверки в соответствии с инструкциями инструмента. Это может быть необходимо для регулировки освещения или сканирование высоты, чтобы получить лучшую топографическую карту. Заполните все плохие или отсутствующие данные с помощью функции интерполяции, а затем сохранить топографической карте.
2. Объем анализ с помощью универсальных программ
В трибологии, испытательные машины часто используют не-конформный контакт тестирования геометрии, такие как шар или цилиндр, который сдвигается или поворачивается против плоским или другой цилиндр. Как правило, материал теряется в момент скользящего контакта, хотя иногда материал может переходить от одной поверхности к другой, и эта «передача слой" будет оцениваться как излишек материала на пое контактирующих образцов. Из-за износа шрам трехмерных и нерегулярный характер, оптический профилометрии может быть только технику, пригодных для получения точных измерений объема износа - приближения не являются действительными. Цель заключается в измерении очень малых количеств материала, который может быть потерян (или получил) в области контакта при завершении теста.
Основной принцип измерения состоит в определении математической плоскости на уровне невозмущенной поверхности: программное обеспечение поверхностный анализ предполагает, что есть "твердой поверхности" (нулевой уровень), что выше этого уровня является "пустым". Анализ функции, которая измеряет интегрированное удалены объеме ниже плоскости "твердой поверхности" будет именоваться как "свободный объем". Функция, которая измеряет интегрированное объема над плоскостью "твердой поверхности" (например, накопление мусора) будет называться "объеме материала».
Реальные нетронутой поверхности арэлектронной редко идеально гладкой и ровной. Для большей точности измерения малых особенности это хорошая практика, чтобы определить область интереса (AOI); области, вне которой исключены из анализа. AOI используется для ограничения области измерения, потому что неровности поверхности способствуют дополнительный объем вычислений, которые на самом деле не от возмущенной области.
3. Плоской поверхности - механический анализ одежда
- Объем анализ плоской поверхности со шрамом траншеи или депрессия, то ли порожденные механического износа, ионно-лучевого распыления, или лазерная абляция, легко выполнить. Получение изображения, такие как Рисунок 4 слева, который показывает, механические шрам на полированной поверхности стали. Выберите AOI, что исключает депрессию, а затем использовать любые наклона и / или функции кривизны удаление доступно до уровня невозмущенной поверхности максимальной плоскостности. Затем с помощью программного обеспечения для установки средняя высота поверхности Z =0. Рисунке 4 справа псевдо вид шрама на плоской поверхности, после этих шагов. С этой точки зрения исключены "свободный объем" окрашен красным цветом. В этой цветовой гамме, темно-коричневый означает низкую областях, в то время как оранжевый означает высокую области.
- Удалить AOI. Если программное обеспечение автоматизированного измерения объема функций, поместите области измерений по шраму. В это программное обеспечение, измерительные функции будет соответствовать "пустота и объема материала" показано с голубым оттенком на рисунке 5. Всего износ "объема материала" над плоскостью вычитается из "свободного объема". Это изменение объема возмущенной поверхности. (Для программного обеспечения, которое не имеет этой функции, но есть гистограмма, или четко визуализировать, какие области возвышаются над поверхностью или ниже поверхности, пропустите шаг 3,2 и перейдите к шагу 3.3.)
Следующие три шага описывают альтернативный метод измерения износа объеме.
- Переверните AOIс шагом 3,1 для того, чтобы шрам региона, которые будут проанализированы (шрам входит сейчас).
- Создание гистограммы данных. Гистограмма представляет собой график вертикальной высоты по оси абсцисс по сравнению с частотой встречаемости по оси ординат. Поместите один курсор на Z = 0 позиция (рис. 6 слева). Это может быть не на пике гистограммы. На этом рисунке курсоры были созданы выборочно анализировать только недостающий материал ниже плоскости. Программное обеспечение интегрируется общего объема между двумя курсорами. Красные тонированные области показывает, что опущены. Оранжевый бесцветный области на рисунке 6 справа ниже поверхности. Гистограмма функция должна создать "свободный объем" номер с помощью курсоров расположены, как показано для измерения материала потеряли от поверхности.
- Используя ту же гистограмму, поместите курсор других на этот раз в Z = 0 высота положение (рис. 7 слева), а другой на противоположном конце. Оранжевый бесцветный районах Рисунок 7 справа над поверхностью. Гистограмма функция должна генерировать "объема материала" номер, то есть излишки материала возвышается над плоской поверхностью. Всего износ "объема материала" вычитается из "свободного объема", так же, как в пункте 3.2. Гистограмма метода должно дать тот же объем износа, как в пункте 3.2, но она предоставляет дополнительные сведения о распределении поднимается и опускается материала, а показана карта распределения этой области.
В приведенном выше примере нет чистого материала потеряли от износа шрамов, вместо этого есть материальная выгода. Это необычно, но иногда происходит, когда материал передается от одного теста контртела к другому.
Тот же "плоская поверхность характеристику" подходы являются полезными для получения объемов удален в экспериментах с ионным напылением и лазерной абляции, рассмотренных в примерах.
4. Плоской поверхности - кратеры и Ion Beam ProИзмерения файлы к оценке распыления, а также для выполнения время-глубина калибровки
В качестве альтернативы известным и широко применяется метод оценки коэффициентов распыления с помощью масс-лосс метод, основанный на прямых весом или кварца МК баланса, 8, 9 мы видим, что метод WLI полезен для прямой визуализации распыления ионных пучков пятна / кратеры получить статическое распыление / растрового сканирования ионного пучка. Рисунок 8 сравнивает продольного сечения месте (зеленый и синий твердый пунктирные линии) нормально падающей статической 5 кэВ и 150 эВ Ar + ионных пучков против своих кратеров (оливковое открытым кругов и голубой открытых алмазы), полученные 100 × 100 пикселей цифрового растрового сканирования одного и того же пучка ионов на поверхности Cu (110) монокристалла. Кривая, соответствующая статической перекрывает луч одного края кратера чтобы продемонстрировать, как растрового сканирования ионного пучка создает кратер во время распыления гepth профилирования.
5. Плоская поверхность - Характеристика лазерной абляции Сверхбыстрая
Сверхбыстрой лазерной абляции признан метод для удаления материала из твердого при минимизации зоны термического влияния. 10 Этот процесс обеспечивает высокую скорость микрообработка с высоким соотношением сторон и минимальные повреждения (трещины, окисление), чтобы оставшийся материал, и открывает возможность эффективной абляции прозрачных материалов 11. Совсем недавно, интерес сложилась в использовании сверхбыстрых абляции в качестве аналитического инструмента. 12-15 высокую нелинейность процесса абляции также предоставляет средства снижения удаленной размер пятна значительно ниже облученных размер пятна ( как правило, определяется на 1 / E 2) и даже ниже дифракционного предела, как это было продемонстрировано 16. Глубина разрешение, а не конкурировать с лучшими методами ионного пучка, может быть <20 нм. Удаление ставки могут быть легко увеличенанелинейно за счет увеличения лазерной энергии, так что очень быстрое профилирование через микрон материала возможна. В идеале, характеризующий удаление материала по сверхбыстрой абляции требуется техника, которая быстро и количественные и хорошо откалибрована, все характеристики выполняются WLI.
На рисунке 9 показано псевдо-изображения двух соседних кратеров образованных повторяющимися абляции GaAs с сверхбыстрых (60 фс, 800 нм) лазерный пучок сфокусирован в пятно размером ≈ 8 мкм и имеющие плотность энергии соответствует 0,4 и 1,0 Дж / см 2.
6. Криволинейных поверхностей - механический анализ одежда
Объем анализ изогнутых регулярной поверхности (шар или цилиндр) похожа на плоской, но требует кривизны удаления. Следующий протокол показывает анализ круговой шрам износ стальной шарик. Чтобы найти потерянный объем от мяча надо делать математической обработки для преобразования мяч сплоской области в плоскость с углублением, а затем измеряют объем отступ как это было сделано в разделе 3 на плоских поверхностях. Износ шрам на мяч будет оцениваться, в первую использованием простой автоматической техники, то с гистограммой техники.
- На рисунке 10 слева показан изометрический вид износа шрам на мяч. Выберите AOI, что исключает износ шрам, и выбрать программное обеспечение кривой инструмент, который превратит поверхность так, чтобы она изношенных депрессии в середине невозмущенной плоской области. Потому что кривизна удаление может быть итеративный метод может быть необходимо для запуска подходят несколько раз, так что спокойно область квартиру нм уровне точности. Любые видимые неоднородности за пределы износа шрам указывает на проблему и расчета не будет правильным. Установить средний рост за шрам Z = 0. Рис. 10 справа показывает псевдо вид шрама после удаления кривизны и установка Z = 0 с AOI правильномаскировки изношенных области.
- Используйте измерительный инструмент, если таковые имеются, для анализа износа, как показано на рисунке 11. Общий объем износа "объема материала" вычитается из "свободного объема".
Следующие шаги описывают альтернативный метод измерения износа объеме.
- В том же порядке, шаг 3,3, инвертный AOI так что износ шрам включен. Создание гистограммы данных. Поместите один курсор на Z = 0 позиция (рис. 12 слева). Оранжевый бесцветный области на рисунке 12 справа ниже поверхности. Гистограмма функция должна создать "свободный объем" номера.
- Используя ту же гистограмму, поместите курсор других на этот раз в Z = 0 высота положение (рис. 13 слева), а другой на противоположном конце. Оранжевый бесцветный области на рисунке 13 справа над поверхностью. Гистограмма функция должна генерировать "объема материала» номер. Общийносить объеме "объема материала" над плоскостью вычитается из "объем пустот", так же, как в пункте 3.2. Гистограмма метод должен рассчитать тот же объем износа, как в пункте 6.2, но она обеспечивает дополнительную информацию о распределении поднимается и опускается материала, а показана карта распределения этой области.
Access restricted. Please log in or start a trial to view this content.
Результаты
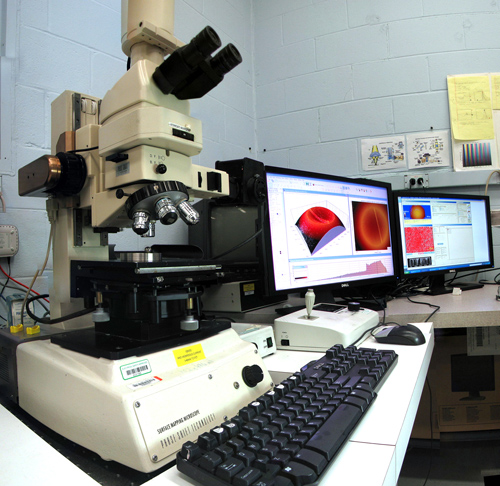
Рисунок 1 фотографией простым профилометра, используемые в настоящем исследовании. Несколько башне целью видно на картинке. Две задачи являются стандартными (10x и 50x), и два Mirau целей (10x и 50x). Этот микрос...
Access restricted. Please log in or start a trial to view this content.
Обсуждение
Пример 1
WLI широко не используется для поверхностной характеристикой в трибологических работы, но это на самом деле мощный метод для количественного измерения износа объемы для многих геометрии контакта. WLI производит полное 3D представление поверхности, которые могут...
Access restricted. Please log in or start a trial to view this content.
Раскрытие информации
Нет конфликта интересов объявлены.
Благодарности
Облученного образца GaAs была предоставлена Ян Цуй из Университета Иллинойса в Чикаго. Эта работа была поддержана по контракту № DE-AC02-06CH11357 между UChicago Аргон, ООО и Министерством энергетики США и НАСА с помощью грантов NNH08AH761 и NNH08ZDA001N, и Управление Автомобиль технологий Министерства энергетики США в рамках контракта DE-AC02 -06CH11357. Электронной микроскопии было сделано на электронный центр микроскопии для исследования материалов в Аргоннской национальной лаборатории Министерства энергетики США Управление по науке лаборатории, выполняемых по договору DE-AC02-06CH11357 по UChicago Аргон, LLC.
Access restricted. Please log in or start a trial to view this content.
Материалы
| Name | Company | Catalog Number | Comments |
| Монокристалла подложки Si, GaAs и Cu | для напыления и абляции | ||
| Чисто металлические сплавы | для трибологии примеры |
Ссылки
- Gao, F., Leach, R. K., Petzing, J., Coupland, J. M. Surface measurement errors using commercial scanning white light interferometers. Meas. Sci. Technol. 19, 015303(2008).
- Cheng, Y. -Y., Wyant, J. C. Multiple-wavelength phase-shifting interferometry. Appl. Opt. 24, 804-807 (1985).
- Kino, G. S., Chim, S. S. C. Mirau correlation microscope. Appl. Opt. 29, 3775-3783 (1990).
- Wyant, J. C. White light interferometry. Proc. SPIE. 4737, 98-107 (2002).
- Sakseev, D. A., Ershenko, E. M., Baryshev, S. V., Bobyl, A. V., Agafonov, D. V. Deep microrelief measurement and stereo photography in scanning electron microscopy. Tech. Phys. 56, 127-131 (2011).
- Morris, R. J. H., Dowsett, M. G. Ion yields and erosion rates for Si1-xGex (0≤x≤1) ultralow energy O2+ secondary ion mass spectrometry in the energy range of 0.25-1 keV. J. Appl. Phys. 105, 114316(2009).
- O'Mahony, C., Hill, M., Brunet, M., Duane, R., Mathewson, A. Characterization of micromechanical structures using white-light interferometry. Meas. Sci. Technol. 14, 1807-1814 (2003).
- Andersen, H. H., Bay, H. L. Sputtering yield measurements. Topics in Applied Physics. Behrisch, R. 47: Sputtering by Particle Bombardment, Springer-Verlag. Berlin, Heidelberg. 145-218 (1981).
- Wu, S. -M., de Kruijs, R. van, Zoethout, E., Bijkerk, F. Sputtering yields of Ru, Mo, and Si under low energy Ar+ bombardment. J. Appl. Phys. 106, 054902(2009).
- Liu, X., Du, D., Mourou, G. Laser ablation and micromachining with ultrashort laser pulses. IEEE J. Quantum Electron. 33, 1706-1716 (1997).
- Gattass, R. R., Mazur, E. Femtosecond laser micromachining in transparent materials. Nature Photonics. 2, 219-225 (2008).
- Russo, R. E., Mao, X., Gonzalez, J. J., Mao, S. S. Femtosecond laser ablation. ICP-MS. J. Anal. At. Spectrom. 17, 1072-1075 (2002).
- Brady, J. J., Judge, E. J., Levis, R. J. Analysis of amphiphilic lipids and hydrophobic proteins using nonresonant femtosecond laser vaporization with electrospray post-ionization. J. Am. Soc. Mass Spectrom. 22, 762-772 (2011).
- Berry, J. I., Sun, S., Dou, Y., Wucher, A., Winograd, N. Laser desorption and imaging of proteins from ice via UV femtosecond laser pulses. Anal. Chem. 75, 5146-5151 (2003).
- Coello, Y., Jones, A. D., Gunaratne, T. C., Dantus, M. Atmospheric pressure femtosecond laser imaging mass spectrometry. Anal. Chem. 82, 2753-2758 (2010).
- Korte, F., Serbin, J., Koch, J., Egbert, A., Fallnich, C., Ostendorf, A., Chichkov, B. N. Towards nanostructuring with femtosecond laser pulses. Appl. Phys. A. 77, 229-235 (2003).
- Fu, Y., Bryan, N. K. A., Shing, O. N., Wyan, H. N. P. Influence analysis of dwell time on focused ion beam micromachining in silicon. Sensors and Actuators A. 79, 230-234 (2000).
- Jiang, F., Li, J., Yan, L., Sun, J., Zhang, S. Optimizing end-milling parameters for surface roughness under different cooling/lubrication conditions. Int. J. Adv. Manuf. Technol. 51, 841-851 (2010).
- Reiter, A. E., Mitterer, C., Figueiredo, M. R., Franz, R. Abrasive and adhesive wear behavior of arc-evaporated Al1-xCrxN hard coatings. Tribol. Lett. 37, 605-611 (2010).
- Devillez, A., Lesko, S., Mozer, W. Cutting tool crater wear measurement with white light interferometry. Wear. 256, 56-65 (2004).
- Shekhawat, V. K., Laurent, M. P., Muehleman, C., Wimmer, M. A. Surface topography of viable articular cartilage measured with scanning white light interferometry. Osteoarthritis and Cartilage. 17, 1197-1203 (2009).
- Hershberger, J., Öztürk, O., Ajayi, O. O., Woodford, J. B., Erdemir, A., Erck, R. A., Fenske, G. R. Evaluation of DLC coatings for spark-ignited, direct-injected fuel systems. Surf. Coat. Technol. 179, 237-244 (2004).
- Ajayi, O. O., Erck, R. A., Lorenzo-Martin, C., Fenske, G. R. Frictional anisotropy under boundary lubrication: Effect of surface texture. Wear. 267, 1214-1219 (2009).
- Wittmaack, K. Analytical description of the sputtering yields of silicon bombarded with normally incident ions. Phys. Rev. B. 68, 235211-23 (2003).
- Zeuner, M., Neumann, H., Scholze, F., Flamm, D., Tartz, M., Bigl, F. Characterization of a modular broad beam ion source. Plasma Sources Sci. Technol. 7, 252-267 (1998).
- Barna, A., Menyhard, M., Kotis, L., Kovacs, G. J., Radnoczi, G., Zalar, A., Panjan, P. Unexpectedly high sputtering yield of carbon at grazing angle of incidence ion bombardment. J. Appl. Phys. 98, 024901(2005).
- Weck, A., Crawford, T. H. R., Wilkinson, D. S., Haugen, H. K., Preston, J. S. Laser drilling of high aspect ratio holes in copper with femtosecond, picosecond and nanosecond pulses. Appl. Phys. A. 90, 537-543 (2008).
- Roosendaal, H. E. Sputtering yields of single crystalline targets. Topics in Applied Physics. ed, I. .,B. ehrisch,R. ., 47: Sputtering by Particle Bombardment, Springer-Verlag. Berlin, Heidelberg. 219-256 (1981).
- Seah, M. P. An accurate semi-empirical equation for sputtering yields II: For neon, argon and xenon ions. Nucl. Instrum. Methods Phys. Res. B. 229, 348-358 (2005).
- Seah, M. P., Clifford, C. A., Green, F. M., Gilmore, I. S. An accurate semi-empirical equation for sputtering yields I: For argon ions. Surf. Interface Anal. 37, 444-458 (2005).
- James Ziegler - SRIM & TRIM [Internet]. , Available from: http://www.srim.org/ (2011).
- Moller, W., Eckstein, W. Tridyn - A TRIM simulation code including dynamic composition changes. Nucl. Instrum. Methods Phys. Res. B. 2, 814-818 (1984).
- Insepov, Z., Norem, J., Veitzer, S. Atomistic self-sputtering mechanisms of rf breakdown in high-gradient linacs. Nucl. Instrum. Methods Phys. Res. B. 268, 642-650 (2010).
- Puech, L., Dubarry, C., Ravel, G., de Vito, E. Modeling of iron oxide deposition by reactive ion beam sputtering. J. Appl. Phys. 107, 054908(2010).
- Ho, S., Tamakoshi, T., Ikeda, M., Mikami, Y., Suzuki, K. Net sputtering rate due to hot ions in a Ne-Xe discharge gas bombarding an MgO layer. J. Appl. Phys. 109, 084908(2011).
- Nakles, M. R. Experimental and Modeling Studies of Low-Energy Ion Sputtering for Ion Thrusters [dissertation]. , Virginia Polytechnic Institute and State University. 1-129 (1988).
- Hada, M., Ninomiya, S., Seki, T., Aoki, T., Matsuo, J. Using ellipsometry for the evaluation of surface damage and sputtering yield in organic films with irradiation of argon cluster ion beams. Surf. Interface Anal. 43, 84-87 (2011).
- Kozole, J., Wucher, A., Winograd, N. Energy deposition during molecular depth profiling experiments with cluster ion beams. Anal. Chem. 80, 5293-5301 (2008).
- Linde, D. vonder, Sokolowski-Tinten, K. The physical mechanisms of short-pulse laser ablation. Appl. Surf. Sci. 154-155, 1-10 (2000).
- Margetic, V., Bolshov, M., Stockhaus, A., Niemax, K., Hergenroder, R. Depth profiling of multi-layer samples using femtosecond laser ablation. J. Anal. At. Spectrom. 16, 616-621 (2001).
- Cui, Y., Moore, J. F., Milasinovic, S., Liu, Y., Gordon, R. J., Hanley, L. Depth profiling and imaging capabilities of an ultrashort pulse laser ablation time of flight mass spectrometer. Rev. Sci. Instrum. 83, 093702(2012).
- Borowiec, A., MacKenzie, M., Weatherly, G. C., Haugen, H. K. Femtosecond laser pulse ablation of GaAs and InP: Studies utilizing scanning and transmission electron microscopy. Appl. Phys. A. 77, 411-417 (2003).
- Harasaki, A., Schmit, J., Wyant, J. C. Offset of coherent envelope position due to phase change on reflection. Appl. Opt. 40, 2102-2106 (2001).
- Luttge, A., Arvidson, R. S. Reactions at surfaces: A new approach integrating interferometry and kinetic simulations. J. Am. Ceram. Soc. 93, 3519-3530 (2010).
- Conroy, M., Mansfield, D. Scanning interferometry: Measuring microscale devices. Nature Photonics. 2, 661-663 (2008).
- Harasaki, A., Wyant, J. C. Fringe modulation skewing effect in white-light vertical scanning interferometry. Appl. Opt. 39, 2101-2106 (2000).
- Roy, M., Schmit, J., Hariharan, P. White-light interference microscopy: Minimization of spurious diffraction effects by geometric phase-shifting. Opt. Express. 17, 4495-4499 (2009).
Access restricted. Please log in or start a trial to view this content.
Перепечатки и разрешения
Запросить разрешение на использование текста или рисунков этого JoVE статьи
Запросить разрешениеThis article has been published
Video Coming Soon
Авторские права © 2025 MyJoVE Corporation. Все права защищены