É necessária uma assinatura da JoVE para visualizar este conteúdo. Faça login ou comece sua avaliação gratuita.
Method Article
Caracterização de modificações superficiais por interferometria de luz branca: Aplicações em Ion Sputtering, ablação por laser, e as experiências Tribologia
Neste Artigo
Resumo
Interferometria microscópio de luz branca é um método sem contato, óptico e rápido para medir a topografia de superfícies. É mostrado como o método pode ser aplicado para a análise de desgaste mecânico, que usam cicatrizes em amostras de teste são analisados tribológicas e na ciência dos materiais para determinar feixe de iões ou deposição catódica volumes de ablação a laser e profundidades.
Resumo
Em ciência de materiais e engenharia muitas vezes é necessário para obter resultados quantitativos de topografia da superfície com resolução micrométrica lateral. Medido a partir da superfície, 3D mapas topográficos podem ser subsequentemente analisados utilizando uma variedade de pacotes de software para extrair a informação que é necessário.
Neste artigo, descreve como interferometria de luz branca, e perfilometria óptica (PO), em geral, combinado com um software de análise genérica superfície, pode ser utilizado para a ciência de materiais e tarefas de engenharia. Neste artigo, uma série de aplicações de interferometria de luz branca para a investigação de modificações superficiais em espectrometria de massa, e usar fenômenos em tribologia e lubrificação são demonstrados. Nós caracterizar os produtos da interacção dos semicondutores e metais com iões energéticos (sputtering), e irradiação laser (ablação), bem como as medições ex situ de desgaste dos corpos de prova tribológicas. Especificamente, vamos discutir:
- Aspectos de espectrometria de massa de íons sputtering tradicional baseada tais como taxas de sputtering / medições rendimentos sobre Si e Cu e conversão de tempo de profundidade subsequente.
- Os resultados de caracterização quantitativa da interacção de irradiação de laser femtosegundo com uma superfície do semicondutor. Estes resultados são importantes para aplicações tais como a espectrometria de massa de ablação, em que as quantidades de material evaporado podem ser estudadas e controladas através de duração de pulso e de energia por impulso. Assim, ao determinar a geometria cratera pode-se definir resolução de profundidade e lateral versus condições experimentais de configuração.
- As medições de parâmetros de rugosidade de superfície em duas dimensões, e as medições quantitativas do desgaste da superfície, que ocorrem como resultado do atrito e desgaste testes.
Algumas desvantagens inerentes, artefatos possíveis, e as avaliações de incerteza da luz brancaabordagem interferometria será discutido e explicado.
Introdução
A superfície de materiais sólidos a uma determina em grande medida, as propriedades de interesse para estes materiais: electronicamente, estruturalmente e quimicamente. Em muitas áreas de pesquisa, a adição de material (por exemplo, deposição de filmes finos por impulsos laser / deposição magnetron sputtering, físico / químico de deposição de vapor), a remoção de material (corrosão iônica reativa, ião sputtering, ablação por laser, etc), ou alguns outros processos, a necessidade de ser caracterizada. Além disso, a modificação da superfície por meio da interação com pulsos de luz energéticos ou partículas carregadas tem inúmeras aplicações e é de interesse fundamental. Tribology, o estudo de atrito e de desgaste, é uma outra área de interesse. Em uma escala de bancada, uma multidão de geometrias de testes tribológicos existe. Geometrias não-conformados de contacto podem ser utilizados, e de uma esfera ou cilindro pode ser deslocado ou girado contra uma superfície plana, uma outra esfera ou cilindro, por um período de tempo, e a quantidade de material que é removida é measured. Por causa da cicatriz de desgaste é tridimensional e irregular na natureza, perfilometria óptica pode ser a única técnica adequada para a obtenção de medições precisas de volume de desgaste. Tarefas de análise comuns incluem também parâmetros de rugosidade superficial, altura passo, a perda de volume do material, profundidade de trincheira, e assim por diante, todos eles podem ser obtidas adicionalmente a visualização da topografia simples em 2D e 3D.
Perfilometria óptica refere-se a qualquer método óptico que é utilizado para reconstruir o perfil de superfícies. Métodos incluem perfilométrica interferométrico de luz branca, laser, ou métodos confocal. Alguns profilometers ópticos obter informações através de abordagens baseadas em objetivos convencionais de difração limitada de microscópio. Por exemplo, um laser de varrimento pode ser integrado com um microscópio para obter a informação de cor verdadeira topográfico e de superfícies. Um segundo método utiliza uma técnica que explora a profundidade extremamente pequeno de foco dos objectivos convencionais para montar uma series de em foco "fatias de imagem" da superfície para obter um mapa 3D topográfico.
Neste trabalho é mostrar como um microscópio de luz branca interferométrico perfilómetro / permite a medição da quantidade de material perdido durante os processos de desgaste mecânico, ou durante os processos de condicionamento de materiais, tais como crateras de iões de pulverização ou de ablação por laser. Mais atenção é dada à metodologia deste método para ilustrar sua grande capacidade instalada que o torna amplamente disponível e atraente para inúmeras aplicações. A maioria dos tipos de WLI empregar a técnica Mirau, que utiliza um espelho interno para o objectivo de microscópio de interferência entre o sinal de referência de luz e a luz reflectida a partir da superfície da amostra. A escolha de Mirau interferometria é ditada por conveniência simples, porque o interferômetro Mirau inteiro pode ser caber dentro da lente da objectiva do microscópio e acoplado a um microscópio óptico normal (Figura 1). Uma série de duas dimensões entreferograms são adquiridos com uma câmera de vídeo e software monta um mapa 3D topográfico. A fonte de luz branca fornece iluminação amplo espectro que ajuda a superar a "franja ordem" ambigüidade inerente a uma fonte monocromática. Uma fonte de luz monocromática de pode ser utilizado para obter uma medição mais precisa da rasos características topográficas. A resolução lateral é fundamentalmente limitada a λ / 2 (abertura numérica, NA = 1), mas na maioria dos casos é maior, sendo determinado pela AN do objectivo, que por sua vez é ligado a ampliação / tamanho do campo de visão. Tabela 1 na Ref. 1 tem uma comparação directa de todos os parâmetros mencionados. Profundidade abordagens de resolução ≈ 1 nm, sendo uma função da natureza da técnica de interferometria. Para mais informações sobre Mirau WLI podem ser encontrados em Refs. 2, 3. Uma introdução na abordagem interferométrica luz branca pode ser encontrado na referência. 4.
Outros métodos para a análise de superfícies são forc atómicamicroscopia e (AFM), microscopia eletrônica de varredura (MEV), e perfilometria caneta. A técnica WLI compara-se favoravelmente com estes métodos e tem as suas próprias vantagens e desvantagens que são devidas à natureza do método óptico.
A AFM é capaz de obter imagens 3D e, assim, correspondentes secções transversais, mas AFM tem uma capacidade limitada de varredura nas laterais (<100 m) e profundidade (<10 mm) eixos. Em contraste com aqueles, a principal vantagem do WLI é o flexível do campo de visão (FOV) de até alguns milímetros com capacidade de imagem real em 3D simultânea. Além disso, como vamos demonstrar que tem capacidade ampla gama vertical, digitalização, permitindo que se possa resolver uma variedade de problemas de modificação da superfície simplesmente. Pesquisadores que trabalharam com a AFM está ciente do problema com o posicionamento avião de uma amostra ao medir características prolongados de baixo gradiente vertical. Geralmente, pode-se pensar em WLI / OP como um "expresso" técnica sobre AFM. É claro, existemum número de áreas para as quais só AFM é adequado: quando as características laterais a serem resolvidos têm dimensões características menores do que a resolução lateral de WLI, ou casos em que os dados de WLI é ambígua devido a desconhecidos ou complexos propriedades ópticas de uma amostra de uma forma que afeta a precisão das medições (a ser discutido mais tarde), etc
A SEM é um modo poderoso de olhar para as superfícies, sendo muito flexível em termos de tamanho FOV com grande profundidade de focagem, maior do que qualquer microscópio óptico convencional pode oferecer. Ao mesmo tempo, imagens 3D por SEM é incómodo, especialmente no que se requer a tomada de estéreo de par imagens que são então convertidos em imagens 3D pelo método anaglífico, ou por meio de observação com os visores ópticos, ou utilizados para o cálculo directo das profundidades entre diferentes pontos de interesse numa amostra. 5 Por outro lado, WLI / OP perfilometria oferece fácil de usar reconstrução 3D com FOV simultaneamente flexível. WLI varre o plenogama altura necessária para a amostra particular (a partir de centenas de nanómetros a micrómetros). WLI não é afectado pela condutividade eléctrica do material de amostra, que pode ser um problema com o SEM. WLI claramente não necessita de um vácuo. Por outro lado, há uma série de aplicações para o qual fornece informações SEM superior: características laterais a serem resolvidas de dimensões características abaixo da resolução lateral do WLI, ou casos em que diferentes partes de uma amostra pode ser topograficamente distinguidos apenas quando secundárias coeficientes de emissão de elétrons diferem.
Mais uma técnica para a inspecção da superfície, a qual é amplamente utilizada na espectrometria de massa de iões secundários 6 e no campo de caracterização de sistemas microeletromecânicos estilete 7 é perfilometria. Esta técnica é muito popular devido à sua simplicidade e robustez. Baseia-se na verificação de contacto mecânico directo de uma ponta de caneta sobre a superfície da amostra. Esta é uma ferramenta de contato grosso, Que é capaz de digitalizar ao longo de uma única linha de cada vez. Ele faz superfície 3D raster-scan de imagem extremamente demorado. Outra desvantagem da técnica de estilete é a dificuldade de medir as características da superfície de relação de aspecto alta e de tamanho comparável com o seu bico característico (submicron a vários microns tipicamente), que implica um raio de ponta e um ângulo de vértice da ponta. Uma vantagem do estilete perfilometria é a sua falta de sensibilidade a diferentes propriedades ópticas de uma amostra, o que pode afectar a precisão da WLI / OP medições (a ser discutido mais tarde).
Os mapas de superfície do artigo, foram obtidos utilizando um equipamento convencional de tipo Mirau WLI (Figura 1). Muitas empresas, como Zygo, KLA-Tencor, nanociência, Zemetrics, Nanovea, FRT, Keyence, Bruker, e Taylor Hobson produzir comerciais de mesa instrumentos OP. Os mapas adquiridos foram reconstruídos e processadas utilizando o software comercial, do tipo que é comumente usado para WLI, eletrônica de varredura, or microscopia da sonda. O software tem a capacidade de realizar manipulações matemáticas da superfície, a seção transversal perfil análise nula, e os cálculos de volume de material, e correção de avião. Outros pacotes de software pode automatizar algumas dessas características.
Access restricted. Please log in or start a trial to view this content.
Protocolo
1. Alinhamento de hardware para digitalização Geral WLI
Para obter informações quantitativas através WLI, as etapas a seguir podem servir como uma diretriz. Assume-se que o operador tenha conhecimento básico de operação interferômetro. As diretrizes são comuns, independentemente do instrumento específico. Para algumas investigações, a amostra será plana. Para outros, a amostra pode ser curvado.
- Coloque a amostra no palco com o recurso (íon sputtered cratera, feixe de íons / ablacionada local, ou usar cicatriz) voltado para cima. Use um objetivo a ampliação de baixa e focar o instrumento sobre ele. Para obter a melhor resolução de uma imagem em que o objecto de interesse em grande parte preenche a tela, ver a figura 2 para um exemplo de uma bola.
- Ajustar a posição vertical da amostra de modo que as franjas de interferência aparece perto da característica de interesse. Para obter uma superfície plana que é desejável que a amostra é inclinado de tal modo que o plano é perpendicular em relação ao eixo óptico, isto é, o espaçamento franja será grande. Para obter uma superfície curva (por exemplo uma esfera), a amostra deve ser orientada de tal forma que franjas estão localizados centralmente em torno da função, tal como na Figura 3.
- Obter uma verificação de acordo com as instruções do instrumento. Pode ser necessário ajustar a altura da iluminação ou de verificação, a fim de obter o melhor mapa topográfico. Preencha os dados defeituosos ou faltando com a função de interpolação, e depois salvar o mapa topográfico.
2. Análise Volume Usando software genérico
Em tribologia, máquinas de teste muitas vezes empregam não-conformes geometrias de contacto de testes, como uma bola ou um cilindro que é deslizado ou rodado contra um cilindro liso ou de outra. Tipicamente, o material é perdido no ponto de contacto de deslizamento, embora, por vezes, o material só pode transferir a partir de uma superfície para outra, e esta "camada de transferência" será medido como um excedente de material nas eme das amostras de contacto. Por causa da cicatriz de desgaste é tridimensional e irregular na natureza, perfilometria óptica pode ser a única técnica adequada para a obtenção de medições precisas de volume de desgaste - aproximações não são válidos. O objectivo consiste em medir as quantidades muito pequenas de material que podem ser perdidos (ou ganho) na região de contacto após a conclusão de um teste.
O princípio básico de medição é o de definir um plano matemático ao nível da superfície intacta: software de análise de superfície assume que há uma "superfície sólida" (nível zero), qualquer que seja superior a este nível é "vazio". A função de análise que mede o volume integrado removido abaixo do plano da "superfície sólida" será referido como o "volume morto". A função que mede o volume integrado por cima do plano da "superfície sólida" (por exemplo, uma acumulação de detritos) será chamado o "volume de material."
Reais superfícies intactas are raramente perfeitamente lisa e plana. Para maior precisão na medição pequenos recursos é uma boa prática para definir uma área de interesse (AOI), a área fora da qual está excluído da análise. A AOI é usado para limitar a área de medição devido irregularidades na superfície contribuem volume adicional para os cálculos que não é verdadeiramente da área perturbada.
3. Superfície plana - Análise desgaste mecânico
- A análise do volume de uma superfície plana com uma cicatriz trincheira ou depressão, seja gerada por desgaste mecânico, de feixes de iões de pulverização, ou a ablação por laser, é fácil de realizar. Obtenção de uma imagem, tal como a Figura 4, que mostra à esquerda uma cicatriz mecânica sobre uma superfície de aço polido. Seleccionar uma AOI, que exclui a depressão e, em seguida, usar qualquer inclinação e / ou a função de remoção de curvatura está disponível para nivelar a superfície intacta a planicidade máximo. Em seguida, use o software para definir a altura média da superfície a Z =0. Figura 4 é uma vista de certa pseudocores de uma cicatriz sobre uma superfície plana após estes passos. Nessa visão, o "volume morto" excluídos é tingido vermelho. Neste esquema de cores, o marrom escuro indica áreas baixas, enquanto laranja indica áreas altas.
- Excluir a AOI. Se o software tem um volume de medição automático função, coloque uma região de medida sobre a cicatriz. Neste software, a função de medição que vai contar o "vazio e volume de material" mostrado com tonalidade azul na Figura 5. Desgaste total é "volume de material" acima do plano subtraído "volume morto". Esta é a variação do volume da superfície perturbado. (Para o software que não tem essa função, mas tem um histograma ou a visualizar claramente as áreas que ficam acima da superfície ou abaixo da superfície, pular o passo 3.2 e vá para o passo 3.3.)
Os três passos seguintes descrevem um método alternativo de medição do volume de desgaste.
- Inverta a AOIa partir do passo 3.1 para permitir que a região da cicatriz a ser analisada (a cicatriz é incluído agora).
- Gerar um histograma dos dados. O histograma é um gráfico da altura vertical na abcissa versus a frequência de ocorrência na ordenada. Coloque um cursor na posição = Z 0 (à esquerda Figura 6). Isto pode não ser no pico do histograma. Nesta figura os cursores foram criados para, seletivamente, analisar somente o material em falta abaixo do plano. O software integra o volume total entre os dois cursores. A área escurecida vermelho mostra o que é omitido. As áreas de laranja não corado da Figura 6 para a direita estão abaixo da superfície. A função de gerar um histograma deve "void volume" número com os cursores posicionados como se mostra para medir o material perdido a partir da superfície.
- Usando o mesmo histograma, situar-se outra vez este na posição altura Z = 0 (Figura 7 esquerdo), e o outro na extremidade oposta. As áreas de laranja não corado em Figura 7 direita estão acima da superfície. A função de histograma deve gerar um "material de volume" número, isto é, material em excesso acima da superfície plana. Desgaste total é "volume de material" subtraído "volume morto", o mesmo que no passo 3.2. O método do histograma deve dar o volume de desgaste mesmo que no passo 3.2, mas fornece detalhes adicionais sobre a distribuição de material levantada e abaixada, e mostra um mapa da distribuição da área.
No exemplo acima, não há material líquido perdido a partir da marca de desgaste, em vez disso, o ganho de material. Isso é incomum, mas às vezes ocorre quando o material transfere de uma contraface teste para outro.
Os mesmos "planas" de superfície de caracterização abordagens são benéficas para a obtenção de volumes removidos em experiências com iões de pulverização catódica e ablação por laser, considerado nos exemplos que se seguem.
4. Superfície lisa - Crateras e Ion Beam ProMedidas arquivos para estimar a produtividade Sputtering, e para realizar Time-to profundidade Calibração
Como uma alternativa para o método conhecido e amplamente utilizado para estimar o rendimento de sputtering utilizando massa de perda de método, baseado na pesagem directa ou equilíbrio quartzo microcristalina, 8, 9, descobrimos que o método é útil para WLI visualização directa da sputtered pontos de feixe de iões / crateras obtidos por pulverização catódica estático / raster digitalização de uma figura feixe. íon 8 compara longitudinais seções transversais de um ponto (verde e azul sólidos linhas pontilhadas) de um incidente normalmente estático 5 keV e 150 eV Ar feixes de íons + contra suas crateras (azeite aberto círculos e losangos abertos) ciano obtida por 100 x 100 pixels de digitalização raster digital do mesmo feixe de iões ao longo da superfície de um Cu (110) de cristal único. A curva correspondente às sobreposições feixe estáticas de uma borda da cratera de demonstrar como raster scan do feixe de iões gera a cratera durante sputter depth perfis.
5. Superfície lisa - Caracterização de Ultrafast ablação por laser
Ultrafast ablação a laser é reconhecido como um método para a remoção de material de um sólido, enquanto minimiza a zona afectada pelo calor. 10 Este processo permite micromachining taxa alta com alta razão de aspecto e danos mínimos (oxidação de craqueamento,) para o restante material, e abre-se a possibilidade de ablação eficiente de materiais transparentes. 11 Mais recentemente, o interesse tem desenvolvido utilizando ablação ultra-rápida, como ferramenta analítica. 12-15 A não linearidade elevada do processo de ablação também proporciona um meio de reduzir o tamanho do ponto ablacionada significativamente abaixo do tamanho do ponto irradiado ( como é tipicamente definida por 1 / e 2), e até mesmo abaixo do limite de difracção, tal como foi demonstrado. resolução de 16 de profundidade, ao passo que não é competitiva com os melhores métodos de feixe de iões, pode ser <20 nm. As taxas de remoção podem ser facilmente aumentadanão linearmente com o aumento da fluência laser, de modo que profiling muito rápida através mícrons de material é possível. Idealmente, o que caracteriza a remoção de material por ablação ultra requer uma técnica que é rápida e quantitativa e bem calibrados, todas as características satisfeitas por WLI.
A Figura 9 mostra as imagens de duas crateras pseudocoloridas vizinhos formadas por ablação repetitiva de GaAs com uma ultra-rápida (60 fs, a 800 nm) do feixe de laser focado para um tamanho de ponto de ≈ 8 um e tendo fluências correspondentes a 0,4 e 1,0 J / cm 2.
6. Superfícies curvas - Análise de desgaste mecânico
A análise do volume de uma superfície curva regular (esfera ou cilindro) é semelhante ao de uma superfície plana, mas requer a remoção da curvatura. O protocolo a seguir mostra uma análise de uma marca de desgaste circular sobre uma esfera de aço. Para calcular o volume perdido de uma bola que é necessário para fazer o processamento matemático para transformar uma bola com umárea plana em uma superfície plana com uma reentrância, em seguida, medir o volume da reentrância, como foi feito na Secção 3 em superfícies planas. A marca de desgaste em uma bola irá ser medido, usando primeiro o mais simples técnica automática, em seguida, com a técnica de histograma.
- A Figura 10 mostra da esquerda uma vista isométrica de uma marca de desgaste em uma bola. Seleccionar uma AOI, que exclui a marca de desgaste, e seleccionar a ferramenta curva software adequado que irá transformar a superfície de modo que é uma depressão gasto no meio de uma área intacta plana. Porque a remoção da curvatura pode ser uma técnica iterativa pode ser necessário para executar os vários tempos de ajuste, de modo que a área não perturbada é plana ao nível NM precisão. Qualquer exterior não-uniformidade visível da marca de desgaste indica um problema eo cálculo não será correta. Definir a altura média fora da cicatriz para Z = 0 Figura 10. Direito mostra uma visão pseudo da cicatriz após a remoção curvatura e ajuste Z = 0 com um AOI corretamentemascarando a área desgastada.
- Usar o instrumento de medição, se disponível, para analisar a desgaste, tal como mostrado na Figura 11. Volume de desgaste total é "volume de material" subtraído do "volume morto".
Os passos que se seguem descrevem um método alternativo de medição do volume de desgaste.
- Do mesmo modo como no passo 3.3, a AOI invertido de modo que a marca de desgaste está incluído. Gerar um histograma dos dados. Coloque um cursor na posição = Z 0 (esquerda Figura 12). As áreas de laranja não corado da Figura 12 para a direita estão abaixo da superfície. A função de histograma deve gerar um "vazio volume" número.
- Usando o mesmo histograma, situar-se outra vez este na posição altura Z = 0 (Figura 13 à esquerda), e o outro na extremidade oposta. As áreas de laranja não corado da Figura 13 para a direita estão acima da superfície. A função de histograma deve gerar um "material volume" número. Totaldesgaste volume é "volume de material" acima do plano subtraído "volume morto", o mesmo que no passo 3.2. O método do histograma deve calcular o volume de desgaste mesmo que no passo 6.2, mas fornece detalhes adicionais sobre a distribuição de material levantada e abaixada, e mostra um mapa da distribuição da área.
Access restricted. Please log in or start a trial to view this content.
Resultados
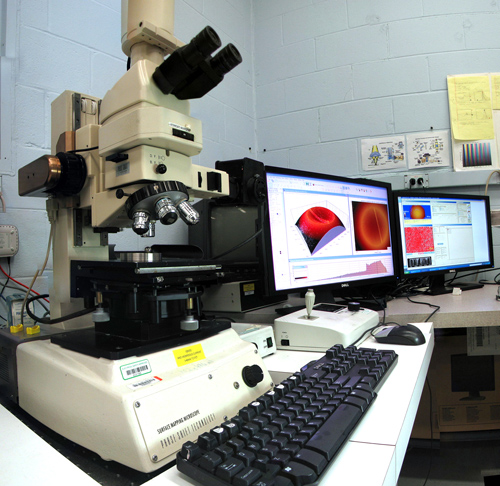
A Figura 1 uma fotografia de perfilometria simples utilizado no presente estudo:. Uma torreta objectivo múltiplo é visto na figura. Dois objetivos são padrão (10x e 50x), e dois são objetivos Mirau (10x e 50x). Este microscópio possui um recurso de ampliação intermediário que permite multiplicadores passo a passo de ampliação de 0,62, 1,00, 1,25, ou 2,00 a ser s...
Access restricted. Please log in or start a trial to view this content.
Discussão
Exemplo 1
WLI não é amplamente utilizada para a caracterização da superfície de trabalho em tribológico, mas é, de facto, um método poderoso para a medição quantitativa de volumes de desgaste de contacto de geometrias diversas. WLI produz uma representação 3D completa da superfície que pode ser analisado utilizando qualquer um dos vários pacotes de software de visualização. Estes pacotes permitir vários tipos de medições a serem executadas. Para maior resolução lateral, as ...
Access restricted. Please log in or start a trial to view this content.
Divulgações
Não há conflitos de interesse declarados.
Agradecimentos
A amostra de GaAs irradiado foi fornecida por Yang Cui, da Universidade de Illinois, em Chicago. Este trabalho foi financiado no âmbito do contrato n º DE-AC02-06CH11357 entre UChicago Argonne, LLC e do Departamento de Energia dos EUA e pela NASA através de doações e NNH08AH761 NNH08ZDA001N, e do Gabinete de Tecnologias de Veículos do Departamento de Energia dos EUA sob contrato DE-AC02 -06CH11357. A microscopia eletrônica foi realizado no Centro de Microscopia Eletrônica de Pesquisa de Materiais no Laboratório Nacional Argonne, um Departamento de Energia dos EUA Escritório de Ciência laboratório, operado sob contrato DE-AC02-06CH11357 por UChicago Argonne, LLC.
Access restricted. Please log in or start a trial to view this content.
Materiais
| Name | Company | Catalog Number | Comments |
| Cristal único substratos de Si, GaAs e Cu | por pulverização catódica e ablação | ||
| Ligas de metais puros | para exemplos tribologia |
Referências
- Gao, F., Leach, R. K., Petzing, J., Coupland, J. M. Surface measurement errors using commercial scanning white light interferometers. Meas. Sci. Technol. 19, 015303(2008).
- Cheng, Y. -Y., Wyant, J. C. Multiple-wavelength phase-shifting interferometry. Appl. Opt. 24, 804-807 (1985).
- Kino, G. S., Chim, S. S. C. Mirau correlation microscope. Appl. Opt. 29, 3775-3783 (1990).
- Wyant, J. C. White light interferometry. Proc. SPIE. 4737, 98-107 (2002).
- Sakseev, D. A., Ershenko, E. M., Baryshev, S. V., Bobyl, A. V., Agafonov, D. V. Deep microrelief measurement and stereo photography in scanning electron microscopy. Tech. Phys. 56, 127-131 (2011).
- Morris, R. J. H., Dowsett, M. G. Ion yields and erosion rates for Si1-xGex (0≤x≤1) ultralow energy O2+ secondary ion mass spectrometry in the energy range of 0.25-1 keV. J. Appl. Phys. 105, 114316(2009).
- O'Mahony, C., Hill, M., Brunet, M., Duane, R., Mathewson, A. Characterization of micromechanical structures using white-light interferometry. Meas. Sci. Technol. 14, 1807-1814 (2003).
- Andersen, H. H., Bay, H. L. Sputtering yield measurements. Topics in Applied Physics. Behrisch, R. 47: Sputtering by Particle Bombardment, Springer-Verlag. Berlin, Heidelberg. 145-218 (1981).
- Wu, S. -M., de Kruijs, R. van, Zoethout, E., Bijkerk, F. Sputtering yields of Ru, Mo, and Si under low energy Ar+ bombardment. J. Appl. Phys. 106, 054902(2009).
- Liu, X., Du, D., Mourou, G. Laser ablation and micromachining with ultrashort laser pulses. IEEE J. Quantum Electron. 33, 1706-1716 (1997).
- Gattass, R. R., Mazur, E. Femtosecond laser micromachining in transparent materials. Nature Photonics. 2, 219-225 (2008).
- Russo, R. E., Mao, X., Gonzalez, J. J., Mao, S. S. Femtosecond laser ablation. ICP-MS. J. Anal. At. Spectrom. 17, 1072-1075 (2002).
- Brady, J. J., Judge, E. J., Levis, R. J. Analysis of amphiphilic lipids and hydrophobic proteins using nonresonant femtosecond laser vaporization with electrospray post-ionization. J. Am. Soc. Mass Spectrom. 22, 762-772 (2011).
- Berry, J. I., Sun, S., Dou, Y., Wucher, A., Winograd, N. Laser desorption and imaging of proteins from ice via UV femtosecond laser pulses. Anal. Chem. 75, 5146-5151 (2003).
- Coello, Y., Jones, A. D., Gunaratne, T. C., Dantus, M. Atmospheric pressure femtosecond laser imaging mass spectrometry. Anal. Chem. 82, 2753-2758 (2010).
- Korte, F., Serbin, J., Koch, J., Egbert, A., Fallnich, C., Ostendorf, A., Chichkov, B. N. Towards nanostructuring with femtosecond laser pulses. Appl. Phys. A. 77, 229-235 (2003).
- Fu, Y., Bryan, N. K. A., Shing, O. N., Wyan, H. N. P. Influence analysis of dwell time on focused ion beam micromachining in silicon. Sensors and Actuators A. 79, 230-234 (2000).
- Jiang, F., Li, J., Yan, L., Sun, J., Zhang, S. Optimizing end-milling parameters for surface roughness under different cooling/lubrication conditions. Int. J. Adv. Manuf. Technol. 51, 841-851 (2010).
- Reiter, A. E., Mitterer, C., Figueiredo, M. R., Franz, R. Abrasive and adhesive wear behavior of arc-evaporated Al1-xCrxN hard coatings. Tribol. Lett. 37, 605-611 (2010).
- Devillez, A., Lesko, S., Mozer, W. Cutting tool crater wear measurement with white light interferometry. Wear. 256, 56-65 (2004).
- Shekhawat, V. K., Laurent, M. P., Muehleman, C., Wimmer, M. A. Surface topography of viable articular cartilage measured with scanning white light interferometry. Osteoarthritis and Cartilage. 17, 1197-1203 (2009).
- Hershberger, J., Öztürk, O., Ajayi, O. O., Woodford, J. B., Erdemir, A., Erck, R. A., Fenske, G. R. Evaluation of DLC coatings for spark-ignited, direct-injected fuel systems. Surf. Coat. Technol. 179, 237-244 (2004).
- Ajayi, O. O., Erck, R. A., Lorenzo-Martin, C., Fenske, G. R. Frictional anisotropy under boundary lubrication: Effect of surface texture. Wear. 267, 1214-1219 (2009).
- Wittmaack, K. Analytical description of the sputtering yields of silicon bombarded with normally incident ions. Phys. Rev. B. 68, 235211-23 (2003).
- Zeuner, M., Neumann, H., Scholze, F., Flamm, D., Tartz, M., Bigl, F. Characterization of a modular broad beam ion source. Plasma Sources Sci. Technol. 7, 252-267 (1998).
- Barna, A., Menyhard, M., Kotis, L., Kovacs, G. J., Radnoczi, G., Zalar, A., Panjan, P. Unexpectedly high sputtering yield of carbon at grazing angle of incidence ion bombardment. J. Appl. Phys. 98, 024901(2005).
- Weck, A., Crawford, T. H. R., Wilkinson, D. S., Haugen, H. K., Preston, J. S. Laser drilling of high aspect ratio holes in copper with femtosecond, picosecond and nanosecond pulses. Appl. Phys. A. 90, 537-543 (2008).
- Roosendaal, H. E. Sputtering yields of single crystalline targets. Topics in Applied Physics. ed, I. .,B. ehrisch,R. ., 47: Sputtering by Particle Bombardment, Springer-Verlag. Berlin, Heidelberg. 219-256 (1981).
- Seah, M. P. An accurate semi-empirical equation for sputtering yields II: For neon, argon and xenon ions. Nucl. Instrum. Methods Phys. Res. B. 229, 348-358 (2005).
- Seah, M. P., Clifford, C. A., Green, F. M., Gilmore, I. S. An accurate semi-empirical equation for sputtering yields I: For argon ions. Surf. Interface Anal. 37, 444-458 (2005).
- James Ziegler - SRIM & TRIM [Internet]. , Available from: http://www.srim.org/ (2011).
- Moller, W., Eckstein, W. Tridyn - A TRIM simulation code including dynamic composition changes. Nucl. Instrum. Methods Phys. Res. B. 2, 814-818 (1984).
- Insepov, Z., Norem, J., Veitzer, S. Atomistic self-sputtering mechanisms of rf breakdown in high-gradient linacs. Nucl. Instrum. Methods Phys. Res. B. 268, 642-650 (2010).
- Puech, L., Dubarry, C., Ravel, G., de Vito, E. Modeling of iron oxide deposition by reactive ion beam sputtering. J. Appl. Phys. 107, 054908(2010).
- Ho, S., Tamakoshi, T., Ikeda, M., Mikami, Y., Suzuki, K. Net sputtering rate due to hot ions in a Ne-Xe discharge gas bombarding an MgO layer. J. Appl. Phys. 109, 084908(2011).
- Nakles, M. R. Experimental and Modeling Studies of Low-Energy Ion Sputtering for Ion Thrusters [dissertation]. , Virginia Polytechnic Institute and State University. 1-129 (1988).
- Hada, M., Ninomiya, S., Seki, T., Aoki, T., Matsuo, J. Using ellipsometry for the evaluation of surface damage and sputtering yield in organic films with irradiation of argon cluster ion beams. Surf. Interface Anal. 43, 84-87 (2011).
- Kozole, J., Wucher, A., Winograd, N. Energy deposition during molecular depth profiling experiments with cluster ion beams. Anal. Chem. 80, 5293-5301 (2008).
- Linde, D. vonder, Sokolowski-Tinten, K. The physical mechanisms of short-pulse laser ablation. Appl. Surf. Sci. 154-155, 1-10 (2000).
- Margetic, V., Bolshov, M., Stockhaus, A., Niemax, K., Hergenroder, R. Depth profiling of multi-layer samples using femtosecond laser ablation. J. Anal. At. Spectrom. 16, 616-621 (2001).
- Cui, Y., Moore, J. F., Milasinovic, S., Liu, Y., Gordon, R. J., Hanley, L. Depth profiling and imaging capabilities of an ultrashort pulse laser ablation time of flight mass spectrometer. Rev. Sci. Instrum. 83, 093702(2012).
- Borowiec, A., MacKenzie, M., Weatherly, G. C., Haugen, H. K. Femtosecond laser pulse ablation of GaAs and InP: Studies utilizing scanning and transmission electron microscopy. Appl. Phys. A. 77, 411-417 (2003).
- Harasaki, A., Schmit, J., Wyant, J. C. Offset of coherent envelope position due to phase change on reflection. Appl. Opt. 40, 2102-2106 (2001).
- Luttge, A., Arvidson, R. S. Reactions at surfaces: A new approach integrating interferometry and kinetic simulations. J. Am. Ceram. Soc. 93, 3519-3530 (2010).
- Conroy, M., Mansfield, D. Scanning interferometry: Measuring microscale devices. Nature Photonics. 2, 661-663 (2008).
- Harasaki, A., Wyant, J. C. Fringe modulation skewing effect in white-light vertical scanning interferometry. Appl. Opt. 39, 2101-2106 (2000).
- Roy, M., Schmit, J., Hariharan, P. White-light interference microscopy: Minimization of spurious diffraction effects by geometric phase-shifting. Opt. Express. 17, 4495-4499 (2009).
Access restricted. Please log in or start a trial to view this content.
Reimpressões e Permissões
Solicitar permissão para reutilizar o texto ou figuras deste artigo JoVE
Solicitar PermissãoExplore Mais Artigos
This article has been published
Video Coming Soon
Copyright © 2025 MyJoVE Corporation. Todos os direitos reservados