A subscription to JoVE is required to view this content. Sign in or start your free trial.
Method Article
אפיון של פני שטח על ידי שינויי Interferometry אור הלבן: יישומים ביון יורקת, אבלציה ליזר, וניסויי Tribology
In This Article
Summary
interferometry מיקרוסקופ אור הלבן הוא אופטי, ללא מגע ומהיר שיטה למדידת הטופוגרפיה של משטחים. הוא הראה כיצד ניתן ליישם השיטה לניתוח בלאי מכאני, שבו ילבש צלקות על דגימות בדיקת tribological מנותחות, ובמדע חומרים כדי לקבוע נפחים ועומקי אבלציה ליזר אלומת יונים מקרטעים או.
Abstract
במדע והנדסת חומרים הוא לעתים קרובות הכרחי כדי להשיג מדידות כמותיות של טופוגרפית משטח עם רזולוצית רוחב מיקרומטר. מהמשטח הנמדד, מפות טופוגרפיות 3D ניתן לנתח לאחר מכן באמצעות מגוון של חבילות תוכנה כדי לחלץ את המידע שצריך.
במאמר זה יתאר כיצד interferometry אור לבן, וprofilometry האופטי (OP) באופן כללי, בשילוב עם תוכנת ניתוח שטח כללית, ניתן להשתמש בו למדע חומרים ומשימות הנדסיות. במאמר זה, מספר היישומים של interferometry אור הלבן לחקירה של שינויים בשטח ספקטרומטריית מסה, וללבוש את התופעות בשחיקה ושימון הם הפגינו. אנו מאפיינים את המוצרים של האינטראקציה של מוליכים למחצה ומתכות עם יונים אנרגטיים (מקרטעת), והקרנת ליזר (אבלציה), כמו גם באתרו לשעבר מדידות של שחיקה של דגימות בדיקת tribological. באופן ספציפי, נדונו:
- היבטים של ספקטרומטריית מסורתית יון המקרטע מבוססת המונית כגון שיעורים מקרטעת / מדידות תשואת סי וCu ולאחר מכן המרת זמן לעומק.
- תוצאות של אפיון כמותי של האינטראקציה של הקרנת ליזר femtosecond עם משטח מוליכים למחצה. תוצאות אלו הן חשובות עבור יישומים כגון ספקטרומטריית מסות אבלציה, שם ניתן ללמוד הכמויות של חומר התאדה ונשלטו באמצעות משך ואנרגית דופק לדופק. לכן, על ידי קביעת גיאומטרית המכתש ניתן להגדיר רזולוצית עומק ורוחב לעומת תנאי התקנה ניסיוניות.
- מדידות של פרמטרי חספוס פני שטח בשני ממדים, ומדידות כמותיות של שחיקת המשטח המתרחשים כתוצאה מחיכוך ושחיקת בדיקות.
כמה חסרונות טמונים, חפצים אפשריים, חוסר ודאות והערכות של האור הלבןגישת interferometry תידון והסבירה.
Introduction
פני השטח של חומרים מוצקים קובעים בנכסים רבים היקף של ריבית עבור החומרים האלה: באופן אלקטרוני, מבחינה המבניות, וכימיה. בתחומים רבים של מחקר, תוספת של חומר (למשל בתצהיר, סרט דק על ידי פעם ליזר / מקרטע בתצהיר magnetron, פיזי / שיקוע כימי), הסרת החומר (תחריט תגובתי יון, יון מקרטע, אבלציה ליזר וכו '), או כמה תהליכים אחרים, צריכים להיות מאופיינים. בנוסף, שינוי פני שטח באמצעות אינטראקציה עם הבזקי אור אנרגטיים או חלקיקים טעונים יש יישומים רבים והנו בעל עניין מהותי. שחיקה, חקר החיכוך והשחיקה, היא אזור אחר של עניין. בסולם benchtop, שפע של גיאומטריות בדיקת tribological קיים. גיאומטריות מגע ללא conformal עשויים לשמש, וכדור או גליל עשוי להיות החליק או הסתובב נגד משטח שטוח, כדור אחר, או גליל, לאורכו של זמן, וכמות החומר שהוסרה היאasured. בגלל צלקת השחיקה היא תלת ממדי ולא סדיר בטבע, profilometry האופטי עשוי להיות הטכניקה המתאימה לקבלת מדידות נפח ללבוש מדויקות בלבד. משימות ניתוח נפוצות כוללות גם פרמטרי משטח חספוס, גובה צעד, אובדן נפח חומר, עומק תעלה, וכן הלאה; כולם ניתן להשיג בנוסף להדמית טופוגרפית 2D and 3D פשוט.
profilometry האופטי מתייחס לכל שיטה אופטית המשמשת לשחזר את הפרופיל של משטחים. שיטות Profilometric כוללות interferometric הלבנה אור, ליזר או שיטות confocal. כמה profilometers האופטי להשיג מידע באמצעות גישות המבוססות על יעדי מיקרוסקופ העקיף מוגבלים קונבנציונליים. לדוגמה, סריקת ליזר עשוי להיות משולב עם מיקרוסקופ כדי להשיג מידע טופוגרפי וצבע אמיתי של משטחים. שיטה שנייה משתמשת בטכניקה המנצלת את העומק הקטן ביותר של מוקד יעדים קונבנציונליים להרכיב סריes של בפוקוס "פרוסות" תמונה של פני השטח כדי להשיג מפה טופוגרפית 3D.
בעבודה זו אנו מראים כיצד / profilometer מיקרוסקופ interferometric אור לבן מאפשר המדידה של כמות החומר שאבדה במהלך תהליכי בלאי מכאניים, או במהלך תהליכי איכול חומר כגון מכתשי יון מקרטעת או אבלציה ליזר. רוב תשומת הלב למתודולוגיה של שיטה זו כדי להמחיש ההספק המותקן הגדול שלה שהופך אותו לזמין באופן נרחב ואטרקטיביים עבור יישומים רבים. רוב סוגי WLI להעסיק את טכניקת Mirau, אשר משתמשת במראה פנימית למטרת מיקרוסקופ כדי לגרום להפרעות בין אור אות הפניה והאור המוחזר ממשטח המדגם. הבחירה של Mirau interferometry מוכתבת על ידי נוחות פשוט, כי ניתן להתאים את interferometer Mirau כל בתוך עדשת המיקרוסקופ האובייקטיבי ומצמיד למיקרוסקופ אופטי רגיל (איור 1). סדרה בין שני ממדיםferograms נרכשים במצלמת וידאו, ותוכנת מרכיבת מפה טופוגרפית 3D. מקור האור הלבן מספק תאורת ספקטרום רחבה שעוזרת להתגבר על העמימות "שולים כדי" הטבועה מקור מונוכרומטי. מקור מונוכרומטי אור עשוי לשמש כדי להשיג מדידה מדויקת יותר של תכונות טופוגרפיות רדודות. רזולוצית הרוחב מוגבלת מיסודה לλ / 2 (צמצם מספרי, NA = 1), אבל ברוב המקרים היא גדול יותר, שנקבע על ידי NA של המטרה, שהוא בתורו מחובר להגדלה / גודל שדה של נוף. טבלת 1 במס. 1 יש השוואה ישירה של כל הפרמטרים שהוזכרו. גישות עומק ברזולוציה ≈ 1 ננומטר, להיות פונקציה של טבע interferometric של הטכניקה. מידע נוסף על Mirau WLI ניתן למצוא בשופטים. 2, 3. מבוא על גישת interferometric אור לבן ניתן למצוא במס. 4.
שיטות אחרות לניתוח של משטחים הן forc האטומימיקרוסקופיה האלקטרונית (AFM), מיקרוסקופיית אלקטרונים סורקים (SEM), וprofilometry חרט. טכניקת WLI משווה לטובה ולשיטות אלה יש יתרונות משלה ואת חסרונות שבשל האופי האופטי של השיטה.
AFM הוא מסוגל לחלץ תמונות 3D וחתכים ובכך מתאימים, אבל AFM יש יכולת סריקה מוגבלת ברוחב (<100 מיקרומטר) ועומק (<10 מיקרומטר) צירים. בניגוד לאלה, היתרון העיקרי של WLI הוא גמיש התחום של הנוף (FOV) של עד כמה מילימטרים עם יכולת הדמיה סימולטנית אמיתית 3D. בנוסף, כפי שנדגים אותו יש יכולת סריקה אנכית מגוון רחבה, המאפשר אחד כדי לפתור מגוון של בעיות של שינוי פני שטח פשוט. חוקרים שעבדו עם AFM מודעים לבעיה עם מיקום של מטוס מדגם עת מדידת תכונות ממושכות של גרדיאנטים אנכיים נמוכים. באופן כללי, שאפשר לחשוב על WLI / OP כטכניקה "מפורשת" על AFM. כמובן, ישמספר האזורים שבם רק AFM המתאים: כאשר תכונות רוחביות להיפתר בעלי ממדים קטנים יותר אופייניים הרזולוציה הרוחבית של WLI, או מקרים שבם נתונים מWLI הם דו משמעיים בשל תכונות אופטיות לא ידועות או מורכבות של מדגם באופן ש משפיע על הדיוק של מדידות (שיידון בהמשך), וכו '
SEM הוא דרך רבה עצמה כדי להסתכל על משטחים, להיות גמישים מאוד במונחים של גודל FOV עם עומק גדול של פוקוס, גדול יותר מכל מיקרוסקופ אופטי קונבנציונלי יכול להציע. במקביל, הדמית 3D על ידי SEM היא מסורבלת, במיוחד כפי שהוא דורש לקיחת תמונות סטריאו-זוג שאז מומרים לתמונות 3D בשיטת anaglyphic, או דרך התבוננות עם צופים אופטיים, או משמשות לחישוב ישיר של עומקים שונים בין נקודתי העניין במדגם. 5 לעומת זאת, profilometry WLI / OP מציעות קל לשימוש, שיקום 3D עם FOV זמנית גמיש. WLI סורק מלאטווח גובה דרוש למדגם המסוים (מננומטרים עד מאה מיקרונים). WLI לא מושפע ממוליכות החשמלית של החומר המדגם, שעלולה להיות בעיה עם SEM. WLI בבירור אינו דורש ואקום. מצד שני יש מספר היישומים שמספק מידע SEM מעולה: תכונות רוחביות להיפתר מממדים אופייניים מתחת לרזולוציה הרוחבית של WLI, או במקרים שבו חלקים שונים של מדגם ניתן להבחין טופוגרפיים רק כאשר מקדמי פליטת אלקטרונים משניים שונה.
יותר טכניקה אחת לבדיקת פני שטח, אשר נמצא בשימוש נרחב ב6 היון ספקטרומטריית מסה והמשנית בתחום אפיון מערכות microelectromechanical 7 היא החרט profilometry. טכניקה זו היא פופולרית בגלל הפשטות והחוסן שלה. הוא מבוסס על סריקת קשר מכאנית ישירה של קצה מחט על פני שטח המדגם. זה הוא כלי ליצירת קשר גס, שהוא מסוגל לסרוק לאורך שורה אחת בכל פעם. זה גורם משטח 3D סריקת סריקת הדמיה מאוד זמן רב. חסרון נוסף של טכניקת החרט הוא הקושי במדידת תכונות פני שטח של יחס גובה גבוה וגודל דומה לגודלו האופייני הקצה (submicron לכמה מיקרונים בדרך כלל) שמרמז על רדיוס עצה וזווית קודקוד קצה. יתרון של החרט profilometry הוא חוסר הרגישות שלו לשינוי תכונות אופטיות של מדגם, אשר יכול להשפיע על הדיוק של מדידות WLI / OP (שיידון בהמשך).
מפות השטח במאמר הנוכחי התקבלו באמצעות קונבנציונלי Mirau סוג WLI (איור 1). חברות רבות כגון Zygo, KLA-Tencor, הנני, Zemetrics, Nanovea, FRT, Keyence, ברוקר, וטיילור הובסון לייצר מכשירי OP טבלה עליונה מסחריים. את המפות שנרכשו שוחזרו ועובדו באמצעות תוכנה מסחרית מהסוג שמשמשת בדרך כלל לWLI, סריקת אלקטרונים, oמיקרוסקופיה r חללית. התוכנה יש את היכולת לבצע מניפולציות מתמטיות של פני השטח, לחצות מקטע פרופיל ניתוח, חלל וחישובי נפח מהותי, ותיקון מטוס. חבילות תוכנה אחרות עשויות להפוך חלק מהתכונות הללו.
Access restricted. Please log in or start a trial to view this content.
Protocol
1. יישור לחומרה כללית WLI הסריקה
כדי לקבל מידע כמוני באמצעות WLI, השלבים הבאים יכולים לשמש כקו מנחה. הנחה הוא כי המפעיל יש ידע בסיסי בהפעלת interferometer. ההנחיות הן משותפות ללא קשר למכשיר הספציפי. לחקירות מסוימות, את הדגימה תהיה שטוחה. עבור אחרים, את הדגימה יכולה להיות עקומה.
- הנח את הדוגמא על הבמה עם התכונה (יון גמגם מכתש, אלומת יונים / מקום ablated, או ללבוש צלקת) פונה כלפי מעלה. השתמש אובייקטיבי-הגדלה נמוכה ולמקד מחדש את הכלי עליו. הפתרון הטוב ביותר להשגת תמונה שבמושא העניין במידה רבה ממלא את המסך, ראה איור 2 לדוגמה לכדור.
- התאם את המיקום האנכי של הדגימה כך ששולי התאבכות יופיעו ליד התכונה של עניין. למשטח שטוח רצויה שהדגימה היא מוטה כך שהמטוס הוא perpendicular לציר האופטי, כלומר המרווח השולי יהיה גדול. למשטח מעוגל (למשל כדור), הדגימה צריכה להיות מונחה מהסוג שהשולים נמצאים במיקום מרכזי סביב התכונה, כמו באיור 3.
- להשיג סריקה על פי הוראות המכשיר. יתכן ויהיה צורך להתאים את גובה תאורה או סריקה על מנת לקבל המפה הטופוגרפית הטובה ביותר. מלא את כל נתונים רעים או חסרים באמצעות פונקציה לשרבב, ולאחר מכן שמור את המפה הטופוגרפית.
2. ניתוח עוצמת קול באמצעות תוכנה כללית
בשחיקה, מכונה בדיקה לעתים קרובות להעסיק גיאומטריות בדיקת קשר שאינם קונפורמי כגון כדור או צילינדר שהחליק או הסתובב נגד שטוח או אחר צילינדר. בדרך כלל, חומר הולך לאיבוד בשלב של זזת קשר, למרות שלפעמים חומר יכול להעביר ממשטח אחד למשנו, ושכבת "העברה" זו תימדד כעודף של חומר על עלדואר של דגימות פנייה. בגלל צלקת השחיקה היא תלת ממדי ולא סדיר בטבע, profilometry האופטי עשוי להיות הטכניקה המתאימה לקבלת מדידות נפח ללבוש מדויקות רק - קירובים אינם תקפים. המטרה היא למדוד את הכמויות קטנות מאוד של חומר שעלול ללכת לאיבוד (או זכה) באזור הפנייה בסיום בדיקה.
העיקרון הבסיסי של מדידה הוא להגדיר מטוס מתמטי ברמה של פני שטח באין מפריע: תוכנת ניתוח שטח מניחה כי יש "משטח מוצק" (רמה אפס), כל מה שמעל רמה זו היא "ריק". פונקצית הניתוח שמודד את הנפח הוסר המשולב מתחת למטוס של "המשטח המוצק" תהיה מכונית "נפח מבוטל". הפונקציה שמודדת את הנפח המשולב מעל למישור "פני השטח המוצקים" (למשל הצטברות של פסולת) תיקרא "נפח החומר."
משטחים ללא הפרעה אמיתיים arדואר לעתים רחוקות חלק לחלוטין ושטוח. לדיוק מרבי במדידת תכונות קטנות זה תרגול טוב להגדיר שטח של עניין (AOI); האזור מחוץ לאשר הוצא מניתוח. AOI משמש כדי להגביל את אזור המדידה בגלל אי סדרים בשטח תורמים נפח נוסף לחישובים שאינם באמת מהאזור המופרע.
3. משטח שטוח - ניתוח בלאי מכאני
- ניתוח נפח של משטח שטוח עם צלקת תעלה או דיכאון, בין אם שנוצר על ידי בלאי מכאני, אלומת יונים מקרטעים, או אבלציה ליזר, הוא קל לביצוע. השג תמונות כגון 4 שמאל האיור שמראה צלקת מכאנית על משטח פלדה מלוטשת. בחר AOI שאינו כולל דיכאון ולאחר מכן להשתמש בכל הטיה ו / או פונקצית הסרת עקמומיות זמינה לרמת פני שטח באין מפריע לשטיחות מקסימלית. ואז להשתמש בתוכנה כדי לקבוע את גובה פני השטח הממוצע לZ =0. איור 4 נכון הוא השקפת pseudocolor של צלקת על משטח שטוח לאחר צעדים אלו. בתצוגה זו "נפח החלל" המנועה צבוע אדום. בערכת צבעים זו, החום הכהה מציין אזורים נמוכים, תוך כתום מסמן אזורים גבוהים.
- מחק AOI. אם התוכנה יש נפח אוטומטי מדידת פונקציה, להציב באזור מדידה מעל הצלקת. בתוכנה זו, פונקצית המדידה יהיה מניין "החלל ונפח חומר" שמוצג בגוון כחול באיור 5. בלאי סה"כ הוא "נפח חומר" מעל למישור נגרע מ" נפח מבוטל ". זה שינוי הנפח של פני השטח המופרע. (לתוכנה שאין לה תפקיד זה, אבל אין לי היסטוגרמה, או כדי להמחיש באופן ברור באילו תחומים הם העלו מעל פני השטח או מתחת לפני השטח, דלג על שלב 3.2 ועבור לשלב 3.3.)
שלושה השלבים הבאים מתארים שיטה חלופית למדידת נפח בלאי.
- הפוך AOIמצעד 3.1 כדי לאפשר לאזור הצלקת להיות מנותח (הצלקת כלולה כעת).
- צור היסטוגרמה של הנתונים. ההיסטוגרמה היא גרף של גובה האנכי בabscissa לעומת תדירות ההופעה בordinate. סמן מקום אחד בZ = 0 המיקום (6 שמאל איור). זה לא יכול להיות בשיאו של היסטוגרמה. בנתון זה את הסמנים לכך, נקבעו באופן סלקטיבי כדי לנתח רק את החומר החסר מתחת למטוס. התוכנה משלבת את הנפח הכולל בין שני סמנים. האזור הצבוע האדום מראה מה מושמט. אזורי untinted הכתומים באיור 6 ימין נמצאים מתחת לפני השטח. פונקצית ההיסטוגרמה צריכה ליצור מספר "הריק נפח" עם הסמנים מוצבים כמוצג למדוד את החומר אבד מהמשטח.
- שימוש באותה היסטוגרמה, הצב את הסמן השני והפעם בZ = 0 עמדת הגובה (משמאל איור 7), והשני בקצה השני. אזורי untinted הכתומים ב 7 זכות האיור היא מעל פני השטח. פונקצית ההיסטוגרמה צריכה ליצור מספר "נפח חומר", חומר עודף כלומר מוגבה מעל המשטח השטוח. בלאי סה"כ הוא "נפח חומר" יורד מ" נפח החלל ", כמו בשלב 3.2. שיטת היסטוגרמה צריכה לתת את אותו נפח ללבוש כמו בשלב 3.2, אבל זה מספק פרטים נוספים אודות ההפצה של חומר עולה ויורד, ומראה מפה של ההתפלגות של אזור זה.
בדוגמא לעיל אין חומר נטו אבד מהצלקת ללבוש, במקומו יש רווח חומרי. זה די חריג, אבל לפעמים מתרחש כאשר חומר מעביר מcounterface מבחן אחד למשנו.
הגישות אותן "השטוחות" משטח האפיון מועילות להשגת כרכים הוסרו בניסויים עם יון מקרטע ואבלציה ליזר, נחשבת בדוגמאות הבאות.
4. משטח שטוח - מכתשים ואלומת היונים Proמדידות קבצים להעריך תשואת יורקת, ולבצע כיול זמן לעומק
כחלופה לשיטה הידועה ומועסק באופן נרחב להערכת תשואות מקרטעת בשיטה המוני אובדן, המבוססת על שקילה ישירה או איזון קוורץ microcrystal, 8, 9 אנו מוצאים ששיטת WLI שימושית להדמיה ישירה של גמגם כתמי אלומת יונים / מכתשים מתקבלים על ידי מקרטע / סריקה סטטית סריקה של קורה. איור 8 יון משווים חתכי אורך של כתם (קווים מלאים וכחולים ירוקים מנוקדים) של כלל אירוע סטטי 5 קאב ו150 eV Ar + יון קורות נגד מכתשיהם (זית פתוחה חוגים ויהלומי טורקיז פתוח) מתקבלים על ידי 100 × 100 פיקסלים סריקת סריקה דיגיטלית של אותה אלומת יונים על פני השטח של Cu (110) גביש יחיד. העקומה המקבילה לחופף הקורה סטטיים שפת המכתש 1 כדי להדגים כיצד סריקת הסריקה של אלומת היונים יוצרת מכתש בגמגום דepth פרופיל.
5. משטח שטוח - אפיון אבלציה ליזר מהירים
אבלציה ליזר מהירים מוכרת כשיטה להסרת חומר ממוצק תוך מזעור אזור החום השפיע. 10 תהליך זה מאפשר micromachining שיעור גבוה עם יחס היבט גבוה וניזק מינימאלי (פיצוח, חמצון) לחומר שנותר, ופותח את האפשרות של אבלציה היעילה של חומרים שקופים. 11 לאחרונה, פתח עניין בשימוש באבלציה ultrafast ככלי אנליטי. 12-15 הליניאריות הגבוהה של תהליך אבלציה מספקת גם אמצעי להקטנת גודל נקודת ablated נמוך משמעותי מגודל הנקודה המוקרן ( כהגדרתו בדרך כלל על ידי 1 / e 2) ואפילו מתחת לגבול ההשתברות, כפי שהדגים כאן. רזולוצית עומק 16, ואילו לא תחרותי עם השיטות הטובות ביותר קורה היון, עשוי להיות <20 ננומטר. שיעורים להסרה בקלות יכולים להיות מוגבריםnonlinearly ידי הגדלת fluence הליזר, כך שהפרופיל מאוד מהיר באמצעות מיקרון של חומר אפשרי. באופן אידיאלי, אפיון הסרת חומר על ידי אבלציה ultrafast דורש טכניקה כי הוא מהיר וכמותית ומכויל היטב, את כל המאפיינים שממלאים WLI.
איור 9 מראה תמונות pseudocolor של שני מכתשים שנוצרו על ידי שכנות אבלציה החוזרת והנשנית של GaAs עם קרן ליזר הממוקדת לנקודה בגודל של מיקרומטר ≈ 8 ויש fluences מקביל ל -0.4 ו -1.0 J / 2 סנטימטר. Ultrafast (60 FS, 800 ננומטר)
6. משטחים מעוגלים - ניתוח בלאי מכאני
ניתוח נפח של משטח רגיל מעוגל (כדור או צילינדר) דומה לזה של דירה, אבל דורש הסרת עיקול. הפרוטוקול הבא מציג ניתוח של צלקת שחיקה עגולה על כדור פלדה. כדי למצוא את אובדן נפח מכדור יש צורך לעשות עיבוד מתמטי כדי להפוך את כדור עםאזור שטוח למישור שטוח בכניסה, ואז למדוד את הנפח של הכניסה, כפי שנעשה בסעיף 3 על משטחים שטוחים. צלקת בלאי על כדור שבו תימדד קודם באמצעות טכניקה האוטומטית הפשוטה, ולאחר מכן עם טכניקת היסטוגרמה.
- 10 איור שמאלי מראה נוף איזומטרי של צלקת בלאי על כדור. בחר AOI שאינו כולל את הצלקת ללבוש, ולבחור את הכלי המתאים עקומת התוכנה שיהפוך את פני השטח, כך שהוא דיכאון שחוק באמצע אזור שטוח באין מפריע. בגלל הסרת עקמת עשויה להיות איטראטיבית ייתכן שיהיה צורך להפעיל את הכושר כמה פעמים, כך שהשטח באין המפריע הוא שטוח לדיוק ברמה ננומטר. כל מחוץ הלא אחידות גלויה של צלקת הבלאי מצביע על בעיה והחישוב לא יהיה נכון. הגדר את הגובה הממוצע מחוץ לצלקת Z = 0. איור 10 ימין מראה נוף pseudocolor של הצלקת לאחר הסרת עיקול והגדרת Z = 0 עם AOI כראוימיסוך האזור השחוק.
- השתמש בכלי המדידה, אם היא זמינה, כדי לנתח את הבלאי, כפי שמוצג באיור 11. נפח כולל הוא ללבוש "נפח חומר" יורד מ" הנפח המבוטל ".
השלבים הבאים מתארים שיטה חלופית למדידת נפח בלאי.
- באותו אופן כצעד 3.3, ללא מרחב AOI כך שהצלקת ללבוש כלולה. צור היסטוגרמה של הנתונים. סמן מקום אחד בZ = 0 העמדה (12 שמאל איור). אזורי untinted הכתומים באיור 12 ימין נמצאים מתחת לפני השטח. פונקצית ההיסטוגרמה צריכה ליצור מספר "נפח חלל".
- שימוש באותה היסטוגרמה, הצב את הסמן השני והפעם בZ = 0 עמדת הגובה (משמאל איור 13), והשני בקצה השני. אזורי untinted הכתומים באיור 13 ימין נמצאים מעל פני השטח. פונקצית ההיסטוגרמה צריכה ליצור מספר "נפח חומר". סך הכלנפח הוא ללבוש "נפח חומר" מעל למישור נגרע מ" נפח החלל ", כמו בשלב 3.2. שיטת היסטוגרמה צריכה לחשב את אותו נפח ללבוש כמו בשלב 6.2, אבל זה מספק פרטים נוספים אודות ההפצה של חומר עולה ויורד, ומראה מפה של ההתפלגות של אזור זה.
Access restricted. Please log in or start a trial to view this content.
תוצאות
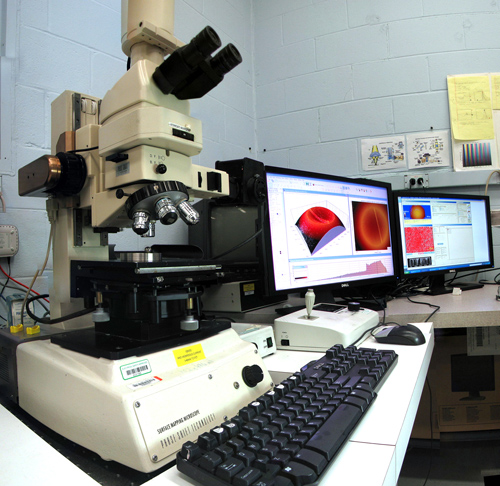
האיור 1 תצלום של profilometer פשוט השתמש במחקר הנוכחי:. צריח אובייקטיבי מרובה הוא רואה בתמונה. שתי מטרות הן סטנדרטיות (10x ו 50x), והשניים הם מטרות Mirau (10x ו 50x). המיקרוסקופ הזה יש תכונת הגדלת ביניים...
Access restricted. Please log in or start a trial to view this content.
Discussion
דוגמה 1
WLI לא נעשה שימוש נרחב לאפיון פני שטח בעבודת tribological, אך הוא למעשה שיטה חזקה למדידת כמותית של כרכים ללבוש לגיאומטריות מגע רבות. WLI מייצר ייצוג 3D מלא של פני השטח שניתן לנתח באמצעות כל אחת ממספר חבילות תוכנת הדמיה. חבילות אלה מאפש?...
Access restricted. Please log in or start a trial to view this content.
Disclosures
אין ניגודי האינטרסים הכריזו.
Acknowledgements
מדגם GaAs המוקרן סופק על ידי יאנג קואי מאוניברסיטת אילינוי בשיקגו. עבודה זו נתמכה תחת חוזה המס DE-AC02-06CH11357 בין UChicago Argonne, LLC ומחלקת אנרגיה של ארה"ב על ידי נאס"א ובאמצעות מענקים וNNH08AH761 NNH08ZDA001N, והמשרד לטכנולוגיות לרכב של משרד אנרגיה של ארה"ב תחת חוזה DE-AC02 -06CH11357. מיקרוסקופ האלקטרונים בוצע במרכז המיקרוסקופי האלקטרונים לחקר חומרים במעבדה הלאומית Argonne, אמריקאי של משרד אנרגיה של מדע המעבדה, פעל תחת חוזה DE-AC02-06CH11357 ידי UChicago Argonne, LLC.
Access restricted. Please log in or start a trial to view this content.
Materials
| Name | Company | Catalog Number | Comments |
| גביש יחידים מצעים של Si, GaAs וCu | למקרטע ואבלציה | ||
| סגסוגות מתכת טהורות | לדוגמאות Tribology |
References
- Gao, F., Leach, R. K., Petzing, J., Coupland, J. M. Surface measurement errors using commercial scanning white light interferometers. Meas. Sci. Technol. 19, 015303(2008).
- Cheng, Y. -Y., Wyant, J. C. Multiple-wavelength phase-shifting interferometry. Appl. Opt. 24, 804-807 (1985).
- Kino, G. S., Chim, S. S. C. Mirau correlation microscope. Appl. Opt. 29, 3775-3783 (1990).
- Wyant, J. C. White light interferometry. Proc. SPIE. 4737, 98-107 (2002).
- Sakseev, D. A., Ershenko, E. M., Baryshev, S. V., Bobyl, A. V., Agafonov, D. V. Deep microrelief measurement and stereo photography in scanning electron microscopy. Tech. Phys. 56, 127-131 (2011).
- Morris, R. J. H., Dowsett, M. G. Ion yields and erosion rates for Si1-xGex (0≤x≤1) ultralow energy O2+ secondary ion mass spectrometry in the energy range of 0.25-1 keV. J. Appl. Phys. 105, 114316(2009).
- O'Mahony, C., Hill, M., Brunet, M., Duane, R., Mathewson, A. Characterization of micromechanical structures using white-light interferometry. Meas. Sci. Technol. 14, 1807-1814 (2003).
- Andersen, H. H., Bay, H. L. Sputtering yield measurements. Topics in Applied Physics. Behrisch, R. 47: Sputtering by Particle Bombardment, Springer-Verlag. Berlin, Heidelberg. 145-218 (1981).
- Wu, S. -M., de Kruijs, R. van, Zoethout, E., Bijkerk, F. Sputtering yields of Ru, Mo, and Si under low energy Ar+ bombardment. J. Appl. Phys. 106, 054902(2009).
- Liu, X., Du, D., Mourou, G. Laser ablation and micromachining with ultrashort laser pulses. IEEE J. Quantum Electron. 33, 1706-1716 (1997).
- Gattass, R. R., Mazur, E. Femtosecond laser micromachining in transparent materials. Nature Photonics. 2, 219-225 (2008).
- Russo, R. E., Mao, X., Gonzalez, J. J., Mao, S. S. Femtosecond laser ablation. ICP-MS. J. Anal. At. Spectrom. 17, 1072-1075 (2002).
- Brady, J. J., Judge, E. J., Levis, R. J. Analysis of amphiphilic lipids and hydrophobic proteins using nonresonant femtosecond laser vaporization with electrospray post-ionization. J. Am. Soc. Mass Spectrom. 22, 762-772 (2011).
- Berry, J. I., Sun, S., Dou, Y., Wucher, A., Winograd, N. Laser desorption and imaging of proteins from ice via UV femtosecond laser pulses. Anal. Chem. 75, 5146-5151 (2003).
- Coello, Y., Jones, A. D., Gunaratne, T. C., Dantus, M. Atmospheric pressure femtosecond laser imaging mass spectrometry. Anal. Chem. 82, 2753-2758 (2010).
- Korte, F., Serbin, J., Koch, J., Egbert, A., Fallnich, C., Ostendorf, A., Chichkov, B. N. Towards nanostructuring with femtosecond laser pulses. Appl. Phys. A. 77, 229-235 (2003).
- Fu, Y., Bryan, N. K. A., Shing, O. N., Wyan, H. N. P. Influence analysis of dwell time on focused ion beam micromachining in silicon. Sensors and Actuators A. 79, 230-234 (2000).
- Jiang, F., Li, J., Yan, L., Sun, J., Zhang, S. Optimizing end-milling parameters for surface roughness under different cooling/lubrication conditions. Int. J. Adv. Manuf. Technol. 51, 841-851 (2010).
- Reiter, A. E., Mitterer, C., Figueiredo, M. R., Franz, R. Abrasive and adhesive wear behavior of arc-evaporated Al1-xCrxN hard coatings. Tribol. Lett. 37, 605-611 (2010).
- Devillez, A., Lesko, S., Mozer, W. Cutting tool crater wear measurement with white light interferometry. Wear. 256, 56-65 (2004).
- Shekhawat, V. K., Laurent, M. P., Muehleman, C., Wimmer, M. A. Surface topography of viable articular cartilage measured with scanning white light interferometry. Osteoarthritis and Cartilage. 17, 1197-1203 (2009).
- Hershberger, J., Öztürk, O., Ajayi, O. O., Woodford, J. B., Erdemir, A., Erck, R. A., Fenske, G. R. Evaluation of DLC coatings for spark-ignited, direct-injected fuel systems. Surf. Coat. Technol. 179, 237-244 (2004).
- Ajayi, O. O., Erck, R. A., Lorenzo-Martin, C., Fenske, G. R. Frictional anisotropy under boundary lubrication: Effect of surface texture. Wear. 267, 1214-1219 (2009).
- Wittmaack, K. Analytical description of the sputtering yields of silicon bombarded with normally incident ions. Phys. Rev. B. 68, 235211-23 (2003).
- Zeuner, M., Neumann, H., Scholze, F., Flamm, D., Tartz, M., Bigl, F. Characterization of a modular broad beam ion source. Plasma Sources Sci. Technol. 7, 252-267 (1998).
- Barna, A., Menyhard, M., Kotis, L., Kovacs, G. J., Radnoczi, G., Zalar, A., Panjan, P. Unexpectedly high sputtering yield of carbon at grazing angle of incidence ion bombardment. J. Appl. Phys. 98, 024901(2005).
- Weck, A., Crawford, T. H. R., Wilkinson, D. S., Haugen, H. K., Preston, J. S. Laser drilling of high aspect ratio holes in copper with femtosecond, picosecond and nanosecond pulses. Appl. Phys. A. 90, 537-543 (2008).
- Roosendaal, H. E. Sputtering yields of single crystalline targets. Topics in Applied Physics. ed, I. .,B. ehrisch,R. ., 47: Sputtering by Particle Bombardment, Springer-Verlag. Berlin, Heidelberg. 219-256 (1981).
- Seah, M. P. An accurate semi-empirical equation for sputtering yields II: For neon, argon and xenon ions. Nucl. Instrum. Methods Phys. Res. B. 229, 348-358 (2005).
- Seah, M. P., Clifford, C. A., Green, F. M., Gilmore, I. S. An accurate semi-empirical equation for sputtering yields I: For argon ions. Surf. Interface Anal. 37, 444-458 (2005).
- James Ziegler - SRIM & TRIM [Internet]. , Available from: http://www.srim.org/ (2011).
- Moller, W., Eckstein, W. Tridyn - A TRIM simulation code including dynamic composition changes. Nucl. Instrum. Methods Phys. Res. B. 2, 814-818 (1984).
- Insepov, Z., Norem, J., Veitzer, S. Atomistic self-sputtering mechanisms of rf breakdown in high-gradient linacs. Nucl. Instrum. Methods Phys. Res. B. 268, 642-650 (2010).
- Puech, L., Dubarry, C., Ravel, G., de Vito, E. Modeling of iron oxide deposition by reactive ion beam sputtering. J. Appl. Phys. 107, 054908(2010).
- Ho, S., Tamakoshi, T., Ikeda, M., Mikami, Y., Suzuki, K. Net sputtering rate due to hot ions in a Ne-Xe discharge gas bombarding an MgO layer. J. Appl. Phys. 109, 084908(2011).
- Nakles, M. R. Experimental and Modeling Studies of Low-Energy Ion Sputtering for Ion Thrusters [dissertation]. , Virginia Polytechnic Institute and State University. 1-129 (1988).
- Hada, M., Ninomiya, S., Seki, T., Aoki, T., Matsuo, J. Using ellipsometry for the evaluation of surface damage and sputtering yield in organic films with irradiation of argon cluster ion beams. Surf. Interface Anal. 43, 84-87 (2011).
- Kozole, J., Wucher, A., Winograd, N. Energy deposition during molecular depth profiling experiments with cluster ion beams. Anal. Chem. 80, 5293-5301 (2008).
- Linde, D. vonder, Sokolowski-Tinten, K. The physical mechanisms of short-pulse laser ablation. Appl. Surf. Sci. 154-155, 1-10 (2000).
- Margetic, V., Bolshov, M., Stockhaus, A., Niemax, K., Hergenroder, R. Depth profiling of multi-layer samples using femtosecond laser ablation. J. Anal. At. Spectrom. 16, 616-621 (2001).
- Cui, Y., Moore, J. F., Milasinovic, S., Liu, Y., Gordon, R. J., Hanley, L. Depth profiling and imaging capabilities of an ultrashort pulse laser ablation time of flight mass spectrometer. Rev. Sci. Instrum. 83, 093702(2012).
- Borowiec, A., MacKenzie, M., Weatherly, G. C., Haugen, H. K. Femtosecond laser pulse ablation of GaAs and InP: Studies utilizing scanning and transmission electron microscopy. Appl. Phys. A. 77, 411-417 (2003).
- Harasaki, A., Schmit, J., Wyant, J. C. Offset of coherent envelope position due to phase change on reflection. Appl. Opt. 40, 2102-2106 (2001).
- Luttge, A., Arvidson, R. S. Reactions at surfaces: A new approach integrating interferometry and kinetic simulations. J. Am. Ceram. Soc. 93, 3519-3530 (2010).
- Conroy, M., Mansfield, D. Scanning interferometry: Measuring microscale devices. Nature Photonics. 2, 661-663 (2008).
- Harasaki, A., Wyant, J. C. Fringe modulation skewing effect in white-light vertical scanning interferometry. Appl. Opt. 39, 2101-2106 (2000).
- Roy, M., Schmit, J., Hariharan, P. White-light interference microscopy: Minimization of spurious diffraction effects by geometric phase-shifting. Opt. Express. 17, 4495-4499 (2009).
Access restricted. Please log in or start a trial to view this content.
Reprints and Permissions
Request permission to reuse the text or figures of this JoVE article
Request PermissionExplore More Articles
This article has been published
Video Coming Soon
Copyright © 2025 MyJoVE Corporation. All rights reserved