Se requiere una suscripción a JoVE para ver este contenido. Inicie sesión o comience su prueba gratuita.
Method Article
Caracterización de modificaciones de la superficie de la interferometría de luz blanca: Aplicaciones en Sputtering Ion, ablación con láser y Experimentos Tribología
En este artículo
Resumen
Interferometría Blanca microscopio de luz es un método óptico sin contacto y rápida para medir la topografía de las superficies. Se muestra cómo el método puede ser aplicado para el análisis de desgaste mecánico, donde el desgaste cicatrices en las muestras de ensayo se analizan tribológicas, y en la ciencia de materiales para determinar por haz de iones de pulverización catódica o volúmenes de ablación por láser y profundidades.
Resumen
En la ciencia e ingeniería de materiales a menudo es necesario para obtener mediciones cuantitativas de la topografía de la superficie con resolución micrométrica lateral. Desde la superficie medida, 3D mapas topográficos pueden ser analizados posteriormente usando una variedad de paquetes de software para extraer la información que se necesita.
En este artículo se describe cómo la interferometría de luz blanca, y perfilometría óptica (OP) en general, en combinación con el software genérico análisis de superficie, se puede utilizar para ciencia de los materiales y las tareas de ingeniería. En este artículo, una serie de aplicaciones de la interferometría de luz blanca para la investigación de modificaciones de la superficie de la espectrometría de masas, y el desgaste de los fenómenos en tribología y lubricación de accionamientos. Hemos caracterizado los productos de la interacción de semiconductores y metales con iones energéticos (sputtering), y la irradiación con láser (ablación), así como ex situ de desgaste de las muestras de ensayo tribológicas. En concreto, hablamos de:
- Aspectos de la tradicional espectrometría de masas de iones bombardeo iónico basado tales como tasas de pulverización / mediciones rendimientos sobre el Si y Cu y posterior conversión tiempo-profundidad.
- Resultados de la caracterización cuantitativa de la interacción de la radiación láser de femtosegundos con una superficie del semiconductor. Estos resultados son importantes para aplicaciones tales como la espectrometría de masa de ablación, donde las cantidades de material evaporado puede ser estudiado y controlado a través de la duración del pulso y la energía por impulso. Por lo tanto, mediante la determinación de la geometría cráter se puede definir la profundidad y la resolución lateral versus las condiciones experimentales de configuración.
- Las mediciones de los parámetros de rugosidad de superficie en dos dimensiones, y las mediciones cuantitativas de la superficie de desgaste que se producen como resultado de la fricción y el desgaste de las pruebas.
Algunos inconvenientes inherentes, artefactos posibles, y las evaluaciones de incertidumbre de la luz blancaenfoque interferometría será discutido y explicado.
Introducción
La superficie de los materiales sólidos determina en gran medida las propiedades de interés para esos materiales: electrónicamente, estructural y químicamente. En muchas áreas de la investigación, la adición de material (por ejemplo, deposición de película delgada por láser pulsado / deposición de pulverización catódica con magnetrón, físico / deposición química en fase vapor), la eliminación de material (grabado iónico reactivo, iones de pulverización catódica, ablación con láser, etc), o algunos otros procesos, es necesario caracterizar. Además, modificación de la superficie mediante la interacción con pulsos de luz energéticas o partículas cargadas tiene numerosas aplicaciones y es de interés fundamental. Tribología, el estudio de la fricción y el desgaste, es otra área de interés. En una escala de sobremesa, una multitud de geometrías de prueba tribológicas existe. No conforme geometrías de contacto pueden utilizarse, y una bola o un cilindro puede deslizar o girar contra una superficie plana, otra bola, o cilindro, para un período de tiempo, y la cantidad de material que se retira es measured. Debido a que la cicatriz de desgaste es tridimensional e irregular en la naturaleza, perfilometría óptica puede ser la única técnica adecuada para obtener medidas precisas de volumen de desgaste. Tareas de análisis habituales incluyen también parámetros de rugosidad de la superficie, la altura de paso, la pérdida de volumen del material, profundidad de la zanja, etc, todos ellos se puede obtener adicionalmente a la visualización sencilla topografía 2D y 3D.
Perfilometría óptica se refiere a cualquier método óptico que se utiliza para reconstruir el perfil de las superficies. Perfilométrica incluir métodos de interferometría de luz blanca, láser o métodos confocal. Algunos perfilómetros ópticos obtener información a través de enfoques basados en los objetivos del microscopio convencional limitadas por difracción. Por ejemplo, un láser de barrido puede estar integrado con un microscopio para obtener información de color topográfico y verdadera de las superficies. Un segundo método utiliza una técnica que explota la profundidad extremadamente pequeño de enfoque de los objetivos convencionales para ensamblar un serioes de In-Focus "cortes de imagen" de la superficie para obtener un mapa topográfico en 3D.
En este trabajo se demuestra como un blanco de luz del microscopio interferométrico / perfilómetro permite la medición de la cantidad de pérdida de material durante los procesos de desgaste mecánico, o durante procesos de grabado de materiales tales como cráteres de iones de pulverización catódica o ablación con láser. Se presta más atención a la metodología de este método para ilustrar su gran capacidad instalada que hace que sea ampliamente disponible y atractivo para numerosas aplicaciones. La mayoría de los tipos de WLI emplean la técnica de Mirau, que utiliza un espejo interno para el objetivo del microscopio para causar interferencias entre una señal de luz de referencia y la luz reflejada desde la superficie de la muestra. La elección de Mirau interferometría está dictada por simple conveniencia, ya que todo el interferómetro Mirau se puede encajar dentro de la lente objetivo del microscopio y acoplada a un microscopio óptico normal (Figura 1). Una serie de dos dimensiones interferograms se adquieren con una cámara de vídeo, software y ensambla un mapa topográfico 3D. La fuente de luz blanca proporciona iluminación de amplio espectro que ayuda a superar la "orden de franja" ambigüedad inherente a una fuente monocromática. Una fuente monocromática de la luz puede ser utilizado para obtener una medición más precisa de las características topográficas superficiales. La resolución lateral se limita fundamentalmente a λ / 2 (apertura numérica NA = 1), pero en la mayoría de los casos es más grande, siendo determinado por el NA del objetivo, que es a su vez conectado a la ampliación / campo de visión de tamaño. Tabla 1 en Ref. 1 tiene una comparación directa de todos los parámetros mencionados. Enfoques profundidad de la resolución ≈ 1 nm, siendo una función de la naturaleza de la técnica interferométrica. Más información sobre Mirau WLI se puede encontrar en las Refs. 2, 3. Una introducción en blanco enfoque de interferometría de luz se puede encontrar en la referencia. 4.
Otros métodos para el análisis de superficies son atómicos FORCe microscopía (AFM), microscopía electrónica de barrido (SEM), y perfilometría lápiz. La técnica WLI compara favorablemente a estos métodos y tiene sus propias ventajas y desventajas que se deben a la naturaleza óptica del método.
La AFM es capaz de obtener imágenes en 3D y las secciones transversales correspondientes así, pero AFM tiene una capacidad de exploración limitada en los laterales (<100 micras) y la profundidad (<10 micras) ejes. En contraste con aquellos, la principal ventaja de la flexibilidad es WLI campo de visión (FOV) de hasta unos pocos milímetros con simultánea capacidad real de imágenes en 3D. Además, como vamos a demostrar que tiene la capacidad a escala vertical de alcance del sensor, lo que permite una para resolver una variedad de problemas de la modificación de la superficie, simplemente. Los investigadores que han trabajado con AFM son conscientes del problema con la colocación de un avión muestra en la medición de las características prolongados de bajos gradientes verticales. Por lo general, uno puede pensar en WLI / OP como un "express" técnica sobre AFM. Por supuesto, hayuna serie de áreas para las que sólo AFM es adecuado: cuando las características laterales a ser resueltos tienen dimensiones características más pequeñas que la resolución lateral de WLI, o casos donde los datos de WLI es ambiguo debido a las propiedades ópticas desconocidos o complejo de una muestra de una manera que afecta a la exactitud de las mediciones (que se discutirá más adelante), etc
El SEM es una poderosa manera de mirar a las superficies, siendo muy flexible en cuanto al tamaño FOV con gran profundidad de foco, más grande que cualquier microscopio óptico convencional puede ofrecer. Al mismo tiempo, las imágenes 3D por SEM es engorroso, especialmente ya que requiere tomar imágenes de par estéreo-que luego se convierten en imágenes en 3D mediante el método anaglyphic, o a través de la observación de los espectadores con ópticos, o utilizado para el cálculo directo de profundidades entre diferentes puntos de interés en una muestra. 5 Por el contrario, WLI / OP perfilometría ofrece fácil de usar, con reconstrucción 3D al mismo tiempo flexible, FOV. WLI explora a través de la plenagama de la altura necesaria para la muestra particular (desde nanómetros hasta cientos de micras). WLI no se ve afectada por la conductividad eléctrica del material de muestra, que puede ser un problema con SEM. WLI claramente no requiere un vacío. Por otro lado hay una serie de aplicaciones para las que proporciona superior SEM información: características laterales para ser resueltos de dimensiones características debajo de la resolución lateral de WLI, o casos donde las diferentes partes de una muestra puede ser topográficamente distinguen sólo cuando coeficientes de emisión de electrones secundarios diferir.
Una técnica más para inspección de superficies, que se utiliza ampliamente en la espectrometría de masas de iones secundarios 6 y en el campo de la caracterización de sistemas microelectromecánicos 7 es lápiz perfilometría. Esta técnica es popular debido a su simplicidad y robustez. Se basa en el escaneado directo contacto mecánico de una punta de lápiz sobre la superficie de la muestra. Esta es una herramienta de contacto gruesa, Que es capaz de escanear a lo largo de una sola línea a la vez. Hace superficie 3D raster-scan demasiado largo. Otro inconveniente de la técnica de lápiz es la dificultad de medir características de la superficie de alta relación de aspecto y de tamaño comparable con el tamaño de la punta de su característica (submicrónico a varias micras típicamente) que implica un radio de punta y un ángulo de punta de vértice. Una ventaja de la aguja de perfilometría es su insensibilidad a diferentes propiedades ópticas de una muestra, que pueden afectar a la precisión de WLI / OP mediciones (que se discute más adelante).
Los mapas de superficie en el presente artículo se obtuvieron usando un convencional Mirau de tipo WLI (Figura 1). Muchas compañías como Zygo, KLA Tencor, nanociencia, Zemetrics, Nanovea, FRT, Keyence, Bruker, y Taylor Hobson producir comerciales de tablero de instrumentos OP. Los mapas fueron reconstruidos adquiridas y procesadas mediante software comercial del tipo que se utiliza comúnmente para WLI, electrónica de barrido, or sonda microscopía. El software tiene la capacidad de realizar manipulaciones matemáticas de la superficie, cruzar el perfil de sección de análisis, vacío y cálculos de volumen de material, y la corrección de avión. Otros paquetes de software pueden automatizar algunas de estas características.
Access restricted. Please log in or start a trial to view this content.
Protocolo
1. Alineación de hardware para General WLI Scan
Para obtener información cuantitativa a través de WLI, los pasos siguientes pueden servir como una guía. Se supone que el operador tiene conocimiento básico de funcionamiento del interferómetro. Las directrices son comunes independientemente del instrumento específico. Para algunas investigaciones, la muestra será plana. Para otros, la muestra puede ser curvado.
- Colocar la muestra en el escenario con la función (ion farfulló cráter, un haz iónico / spot extirpado, o usar la cicatriz) mirando hacia arriba. Utilice un objetivo de bajo aumento y centrar el instrumento en ella. Para una mejor resolución obtener una imagen en la que el objeto de interés en gran parte llena la pantalla, véase la figura 2 para un ejemplo de un balón.
- Ajustar la posición vertical de la muestra de modo que las franjas de interferencia aparecen cerca de la característica de interés. Para obtener una superficie plana, es deseable que la muestra está inclinado de tal manera que el plano es perpendicular al eje óptico, es decir, la separación franja será grande. Para una superficie curva (por ejemplo, una bola), la muestra debe ser orientada de modo que las franjas están ubicados alrededor de la característica, tal como en la figura 3.
- Obtener una exploración de acuerdo con las instrucciones del instrumento. Puede ser necesario ajustar la altura de iluminación o de exploración con el fin de obtener el mejor mapa topográfico. Rellene los datos incorrectos o que faltan utilizando la función de interpolación, a continuación, guardar el mapa topográfico.
2. Volumen de análisis con el software genérico
En tribología, máquinas de prueba emplean a menudo no conforme geometrías de prueba de contacto tales como una bola o un cilindro que se desliza o gira contra un cilindro plano o de otro. Típicamente, el material se pierde en el punto de contacto deslizante, aunque a veces material puede transferir desde una superficie a otra, y esta "capa de transferencia" se mide como un excedente de material en ele de los especímenes de contacto. Debido a que la cicatriz de desgaste es tridimensional e irregular en la naturaleza, perfilometría óptica puede ser la única técnica adecuada para obtener medidas precisas de volumen de desgaste - aproximaciones no son válidos. El objetivo es medir las cantidades muy pequeñas de material que puede ser perdido (o ganado) en la región de contacto en la realización de una prueba.
El principio básico de medida es definir un plano matemático en el nivel de la superficie no perturbado: software de análisis de superficie se supone que hay una "superficie sólida" (nivel cero), lo que por encima de este nivel es "vacío". La función de análisis que mide el volumen integrado eliminado por debajo del plano de la "superficie sólida" se refiere como "volumen vacío." La función que mide el volumen integrado por encima del plano de la "superficie sólida" (por ejemplo, una acumulación de restos) se denominará el "volumen de material."
Bienes inalteradas las superficies are rara vez perfectamente lisa y plana. Para una mayor precisión en la medición de características pequeñas es una buena práctica para definir un área de interés (AOI); la zona fuera de los cuales se excluyeron del análisis. La AOI se utiliza para restringir el área de medición debido a las irregularidades en la superficie contribuyen volumen adicional para los cálculos que no es verdad del área perturbada.
3. Superficie plana - Análisis desgaste mecánico
- Análisis del volumen de una superficie plana con una cicatriz zanja o depresión, ya sea generado por el desgaste mecánico, de haz de iones de pulverización catódica, o ablación por láser, es fácil de realizar. Obtener una imagen tal como la Figura 4 izquierda que muestra una cicatriz mecánica sobre una superficie de acero pulido. Selecciona una AOI que excluye la depresión y luego utilizar cualquier inclinación y / o función de eliminación de curvatura está disponible para nivelar la superficie sin perturbaciones a la máxima planaridad. A continuación, utilice el software para ajustar la altura media de la superficie para Z =0. Figura 4 es una vista derecha pseudocolor de una cicatriz en una superficie plana después de estos pasos. En esta visión los excluidos "volumen muerto" se tiñe de color rojo. En este esquema de color, el marrón oscuro denota las zonas bajas, mientras que el naranja indica las zonas altas.
- Eliminar la AOI. Si el software tiene un volumen de medición de la función automatizada, coloque una región de medición sobre la cicatriz. En este programa, la función de medición se cuenta el "vacío y el volumen de material" se muestra con tinte azul en la Figura 5. Desgaste total es "volumen de material" por encima del plano resta de "volumen muerto". Este es el cambio de volumen de la superficie alterada. (Para el software que no tiene esta función, pero tiene un histograma, o visualizar claramente las áreas que se elevan por encima de la superficie o por debajo de la superficie, omita el paso 3.2 y vaya al paso 3.3.)
Los siguientes tres pasos describen un método alternativo de medir el volumen de desgaste.
- Invierta la AOIdesde el paso 3.1 para que la región cicatriz a analizar (la cicatriz se incluye ahora).
- Generar un histograma de los datos. El histograma es un gráfico de la altura vertical sobre el eje de abscisas frente a la frecuencia de ocurrencia en la ordenada. Coloque un cursor en la posición Z = 0 (Figura 6 a la izquierda). Esto puede no ser en el pico del histograma. En esta figura, los cursores se han creado para analizar selectivamente sólo el material que falta debajo del plano. El software se integra el volumen total entre los dos cursores. El área coloreada roja muestra lo que se omite. Las áreas de color naranja no polarizadas en la figura 6 a la derecha por debajo de la superficie. La función de histograma debe generar un "volumen vacío" número con los cursores posicionados como se muestra para medir la pérdida de material de la superficie.
- Usando el histograma mismo, colocar el otro cursor esta vez en la posición de altura Z = 0 (Figura 7 a la izquierda), y el otro en el extremo opuesto. Las zonas de color naranja no polarizadas en Figura 7 a la derecha están por encima de la superficie. La función de histograma debe generar un "volumen importante" número, es decir, material excedente levantado por encima de la superficie plana. Desgaste total es "volumen de material" resta "volumen muerto", lo mismo que en el paso 3.2. El método de histograma debe dar el volumen de desgaste que en el paso 3,2, pero proporciona detalles adicionales acerca de la distribución de material de subir y bajar, y muestra un mapa de la distribución de este área.
En el ejemplo anterior no hay material de red pierde de la cicatriz de desgaste en su lugar hay ganancia material. Esto es inusual, pero a veces se produce cuando el material se transfiere de contracara de ensayo a otro.
Las mismas "planas caracterización de la superficie" enfoques son beneficiosos para la obtención de los volúmenes retirados en experimentos con iones de bombardeo iónico y la ablación con láser, considerado en los ejemplos que siguen.
4. Superficie plana - Cráteres y Ion Beam ProMediciones de archivos para estimar el rendimiento de sputtering, y para realizar Time-to-profundidad de calibración
Como una alternativa al método conocido y ampliamente utilizado para estimar los rendimientos de pulverización catódica utilizando la pérdida de masa método, basado en el peso directo o cuarzo equilibrio microcristal, 8, 9 se encuentra que el método WLI es útil para la visualización directa de la sputtered puntos de haces de iones / cráteres obtenidos por pulverización catódica estática / exploración de trama de un haz de iones. Figura 8 compara las secciones transversales longitudinales de un punto (líneas de puntos verdes sólidos y azul) de un incidente normalmente estática 5 keV y 150 eV Ar haces de iones + contra sus cráteres (oliva abierto círculos y diamantes cian abiertos) obtenido por 100 × 100 pixeles de escaneo raster digital del haz de iones mismo sobre la superficie de una Cu (110) de cristal único. La curva correspondiente a la superposición de haz estáticas de un borde del cráter para demostrar cómo la exploración de trama del haz de iones genera el cráter durante sputter depth perfiles.
5. Superficie plana - Caracterización de la ablación láser ultrarrápido
Ultrafast ablación con láser es reconocida como un método para la eliminación de material de un sólido y reducir al mínimo la zona afectada por el calor. 10 Este proceso permite micromecanizado tasa alta con altas relaciones de aspecto y un daño mínimo (grietas, oxidación) para el material restante, y se abre la posibilidad de ablación eficaz de materiales transparentes. 11 Más recientemente, el interés se ha desarrollado en la utilización de la ablación ultrarrápida como una herramienta analítica. 12-15 La no linealidad alta del proceso de ablación también proporciona un medio para reducir el tamaño del punto ablacionada significativamente por debajo del tamaño de punto irradiado ( como definido típicamente por 1/2 e) y aún por debajo del límite de difracción, como se ha demostrado. 16 resolución de profundidad, mientras que no competitiva con los mejores métodos de haz de iones, puede ser <20 nm. Las tasas de extracción puede ser fácilmente incrementadono lineal mediante el aumento de la fluencia del láser, de modo que los perfiles muy rápida a través de micras de material es posible. Idealmente, la caracterización de la eliminación de material por ablación ultrarrápida requiere una técnica que es rápido y cuantitativo y calibrado bien, todas las características cumplidas por WLI.
La Figura 9 muestra imágenes pseudocolor de dos cráteres formados por vecinos ablación repetitivo de GaAs con un ultrarrápido (60 fs, 800 nm) haz láser enfocado a un tamaño de punto de ≈ 8 micras y con influencias correspondientes a 0,4 y 1,0 2 J / cm.
6. Superficies Curvas - Análisis de desgaste mecánico
Análisis del volumen de una superficie curva regular (bola o cilindro) es similar a la de un plano, pero requiere la eliminación curvatura. El protocolo siguiente muestra un análisis de una cicatriz de desgaste circular sobre una bola de acero. Para encontrar el volumen perdido de una bola que es necesario realizar un procesamiento matemático para transformar una bola con unárea plana en un plano con una muesca, a continuación, medir el volumen de la muesca como se hizo en la Sección 3, sobre superficies planas. Una cicatriz de desgaste en una bola será medido, primero utilizando la técnica más sencilla automático, a continuación, con la técnica de histograma.
- Figura 10 izquierda muestra una vista isométrica de una cicatriz de desgaste sobre una pelota. Selecciona una AOI que excluye la cicatriz de desgaste, y seleccionar la herramienta de software de adaptación de curva que va a transformar la superficie de modo que es una depresión desgastado en el centro de un área plana sin perturbaciones. Dado que la eliminación curvatura puede ser una técnica iterativa puede ser necesario para ejecutar los tiempos de ajuste varios de modo que el área sin perturbar es plano a nivel de precisión nm. Cualquier falta de uniformidad visible fuera de la cicatriz de desgaste indica un problema y el cálculo no será correcta. Ajuste la altura media fuera de la cicatriz a Z = 0. Figura 10 derecha muestra una vista pseudocolor de la cicatriz después de la eliminación y el establecimiento de curvatura Z = 0 con una AOI correctamenteenmascarando el área desgastada.
- Utilice la herramienta de medición, si están disponibles, para analizar el desgaste, como se muestra en la Figura 11. Volumen de desgaste total es "volumen de material" resta del "volumen muerto".
Los pasos siguientes describen un método alternativo para medir el volumen de desgaste.
- De la misma manera que en el paso 3,3, invertir la AOI para que la cicatriz de desgaste está incluido. Generar un histograma de los datos. Coloque un cursor en la posición Z = 0 (Figura 12 izquierda). Las áreas de color naranja no polarizadas en la figura 12 a la derecha por debajo de la superficie. La función de histograma debe generar un "volumen muerto" número.
- Usando el histograma mismo, colocar el otro cursor esta vez en la posición de altura Z = 0 (figura 13 a la izquierda), y el otro en el extremo opuesto. Las zonas de color naranja no polarizadas en la figura 13 derecha están por encima de la superficie. La función de histograma debe generar un "volumen importante" número. Totalllevar volumen es "volumen de material" por encima del plano resta de "volumen vacío", el mismo que en el paso 3,2. El método de histograma debe calcular el volumen de desgaste que en el paso 6,2, pero proporciona detalles adicionales acerca de la distribución de material de subir y bajar, y muestra un mapa de la distribución de este área.
Access restricted. Please log in or start a trial to view this content.
Resultados
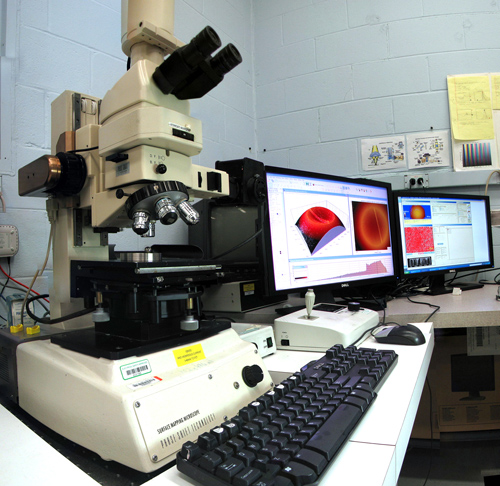
Figura 1 Fotografía de un perfilómetro simple utilizado en el presente estudio:. Una torreta objetivo múltiple se observa en la imagen. Dos objetivos son estándar (10x y 50x), y dos son objetivos Mirau (10x y 50x). Este microscopio tiene una función de aumento intermedio que permite el paso a paso multiplicadores magnificación de 0,62, 1,00, 1,25, 2,00 o para ser sel...
Access restricted. Please log in or start a trial to view this content.
Discusión
Ejemplo 1
WLI no es ampliamente utilizado para la caracterización de superficie de trabajo en tribológico, pero es de hecho un potente método para la medición cuantitativa de los volúmenes de desgaste para geometrías de varios contactos. WLI produce una representación completa en 3D de la superficie que puede ser analizada usando uno de varios paquetes de software de visualización. Estos paquetes permiten diversos tipos de mediciones a realizar. Para una mayor resolución lateral, las i...
Access restricted. Please log in or start a trial to view this content.
Divulgaciones
No hay conflictos de interés declarado.
Agradecimientos
La muestra irradiada GaAs fue proporcionada por Cui Yang, de la Universidad de Illinois en Chicago. Esta obra fue financiada en virtud del Contrato N º DE-AC02-06CH11357 entre UChicago Argonne, LLC y el Departamento de Energía de EE.UU. y la NASA a través de subvenciones y NNH08AH761 NNH08ZDA001N, y la Oficina de Tecnologías de Vehículos del Departamento de Energía de EE.UU. bajo contrato DE-AC02 -06CH11357. La microscopía electrónica se realizó en el Centro de Microscopía Electrónica de Investigación de Materiales de Argonne National Laboratory, un Departamento de EE.UU. de la Oficina de Energía de la Ciencia de laboratorio, operado bajo el contrato DE-AC02-06CH11357 por UChicago Argonne, LLC.
Access restricted. Please log in or start a trial to view this content.
Materiales
| Name | Company | Catalog Number | Comments |
| Sustratos de cristal único de Si, GaAs y Cu | por bombardeo iónico y la ablación | ||
| Aleaciones de metales puros | para ejemplos de tribología |
Referencias
- Gao, F., Leach, R. K., Petzing, J., Coupland, J. M. Surface measurement errors using commercial scanning white light interferometers. Meas. Sci. Technol. 19, 015303(2008).
- Cheng, Y. -Y., Wyant, J. C. Multiple-wavelength phase-shifting interferometry. Appl. Opt. 24, 804-807 (1985).
- Kino, G. S., Chim, S. S. C. Mirau correlation microscope. Appl. Opt. 29, 3775-3783 (1990).
- Wyant, J. C. White light interferometry. Proc. SPIE. 4737, 98-107 (2002).
- Sakseev, D. A., Ershenko, E. M., Baryshev, S. V., Bobyl, A. V., Agafonov, D. V. Deep microrelief measurement and stereo photography in scanning electron microscopy. Tech. Phys. 56, 127-131 (2011).
- Morris, R. J. H., Dowsett, M. G. Ion yields and erosion rates for Si1-xGex (0≤x≤1) ultralow energy O2+ secondary ion mass spectrometry in the energy range of 0.25-1 keV. J. Appl. Phys. 105, 114316(2009).
- O'Mahony, C., Hill, M., Brunet, M., Duane, R., Mathewson, A. Characterization of micromechanical structures using white-light interferometry. Meas. Sci. Technol. 14, 1807-1814 (2003).
- Andersen, H. H., Bay, H. L. Sputtering yield measurements. Topics in Applied Physics. Behrisch, R. 47: Sputtering by Particle Bombardment, Springer-Verlag. Berlin, Heidelberg. 145-218 (1981).
- Wu, S. -M., de Kruijs, R. van, Zoethout, E., Bijkerk, F. Sputtering yields of Ru, Mo, and Si under low energy Ar+ bombardment. J. Appl. Phys. 106, 054902(2009).
- Liu, X., Du, D., Mourou, G. Laser ablation and micromachining with ultrashort laser pulses. IEEE J. Quantum Electron. 33, 1706-1716 (1997).
- Gattass, R. R., Mazur, E. Femtosecond laser micromachining in transparent materials. Nature Photonics. 2, 219-225 (2008).
- Russo, R. E., Mao, X., Gonzalez, J. J., Mao, S. S. Femtosecond laser ablation. ICP-MS. J. Anal. At. Spectrom. 17, 1072-1075 (2002).
- Brady, J. J., Judge, E. J., Levis, R. J. Analysis of amphiphilic lipids and hydrophobic proteins using nonresonant femtosecond laser vaporization with electrospray post-ionization. J. Am. Soc. Mass Spectrom. 22, 762-772 (2011).
- Berry, J. I., Sun, S., Dou, Y., Wucher, A., Winograd, N. Laser desorption and imaging of proteins from ice via UV femtosecond laser pulses. Anal. Chem. 75, 5146-5151 (2003).
- Coello, Y., Jones, A. D., Gunaratne, T. C., Dantus, M. Atmospheric pressure femtosecond laser imaging mass spectrometry. Anal. Chem. 82, 2753-2758 (2010).
- Korte, F., Serbin, J., Koch, J., Egbert, A., Fallnich, C., Ostendorf, A., Chichkov, B. N. Towards nanostructuring with femtosecond laser pulses. Appl. Phys. A. 77, 229-235 (2003).
- Fu, Y., Bryan, N. K. A., Shing, O. N., Wyan, H. N. P. Influence analysis of dwell time on focused ion beam micromachining in silicon. Sensors and Actuators A. 79, 230-234 (2000).
- Jiang, F., Li, J., Yan, L., Sun, J., Zhang, S. Optimizing end-milling parameters for surface roughness under different cooling/lubrication conditions. Int. J. Adv. Manuf. Technol. 51, 841-851 (2010).
- Reiter, A. E., Mitterer, C., Figueiredo, M. R., Franz, R. Abrasive and adhesive wear behavior of arc-evaporated Al1-xCrxN hard coatings. Tribol. Lett. 37, 605-611 (2010).
- Devillez, A., Lesko, S., Mozer, W. Cutting tool crater wear measurement with white light interferometry. Wear. 256, 56-65 (2004).
- Shekhawat, V. K., Laurent, M. P., Muehleman, C., Wimmer, M. A. Surface topography of viable articular cartilage measured with scanning white light interferometry. Osteoarthritis and Cartilage. 17, 1197-1203 (2009).
- Hershberger, J., Öztürk, O., Ajayi, O. O., Woodford, J. B., Erdemir, A., Erck, R. A., Fenske, G. R. Evaluation of DLC coatings for spark-ignited, direct-injected fuel systems. Surf. Coat. Technol. 179, 237-244 (2004).
- Ajayi, O. O., Erck, R. A., Lorenzo-Martin, C., Fenske, G. R. Frictional anisotropy under boundary lubrication: Effect of surface texture. Wear. 267, 1214-1219 (2009).
- Wittmaack, K. Analytical description of the sputtering yields of silicon bombarded with normally incident ions. Phys. Rev. B. 68, 235211-23 (2003).
- Zeuner, M., Neumann, H., Scholze, F., Flamm, D., Tartz, M., Bigl, F. Characterization of a modular broad beam ion source. Plasma Sources Sci. Technol. 7, 252-267 (1998).
- Barna, A., Menyhard, M., Kotis, L., Kovacs, G. J., Radnoczi, G., Zalar, A., Panjan, P. Unexpectedly high sputtering yield of carbon at grazing angle of incidence ion bombardment. J. Appl. Phys. 98, 024901(2005).
- Weck, A., Crawford, T. H. R., Wilkinson, D. S., Haugen, H. K., Preston, J. S. Laser drilling of high aspect ratio holes in copper with femtosecond, picosecond and nanosecond pulses. Appl. Phys. A. 90, 537-543 (2008).
- Roosendaal, H. E. Sputtering yields of single crystalline targets. Topics in Applied Physics. ed, I. .,B. ehrisch,R. ., 47: Sputtering by Particle Bombardment, Springer-Verlag. Berlin, Heidelberg. 219-256 (1981).
- Seah, M. P. An accurate semi-empirical equation for sputtering yields II: For neon, argon and xenon ions. Nucl. Instrum. Methods Phys. Res. B. 229, 348-358 (2005).
- Seah, M. P., Clifford, C. A., Green, F. M., Gilmore, I. S. An accurate semi-empirical equation for sputtering yields I: For argon ions. Surf. Interface Anal. 37, 444-458 (2005).
- James Ziegler - SRIM & TRIM [Internet]. , Available from: http://www.srim.org/ (2011).
- Moller, W., Eckstein, W. Tridyn - A TRIM simulation code including dynamic composition changes. Nucl. Instrum. Methods Phys. Res. B. 2, 814-818 (1984).
- Insepov, Z., Norem, J., Veitzer, S. Atomistic self-sputtering mechanisms of rf breakdown in high-gradient linacs. Nucl. Instrum. Methods Phys. Res. B. 268, 642-650 (2010).
- Puech, L., Dubarry, C., Ravel, G., de Vito, E. Modeling of iron oxide deposition by reactive ion beam sputtering. J. Appl. Phys. 107, 054908(2010).
- Ho, S., Tamakoshi, T., Ikeda, M., Mikami, Y., Suzuki, K. Net sputtering rate due to hot ions in a Ne-Xe discharge gas bombarding an MgO layer. J. Appl. Phys. 109, 084908(2011).
- Nakles, M. R. Experimental and Modeling Studies of Low-Energy Ion Sputtering for Ion Thrusters [dissertation]. , Virginia Polytechnic Institute and State University. 1-129 (1988).
- Hada, M., Ninomiya, S., Seki, T., Aoki, T., Matsuo, J. Using ellipsometry for the evaluation of surface damage and sputtering yield in organic films with irradiation of argon cluster ion beams. Surf. Interface Anal. 43, 84-87 (2011).
- Kozole, J., Wucher, A., Winograd, N. Energy deposition during molecular depth profiling experiments with cluster ion beams. Anal. Chem. 80, 5293-5301 (2008).
- Linde, D. vonder, Sokolowski-Tinten, K. The physical mechanisms of short-pulse laser ablation. Appl. Surf. Sci. 154-155, 1-10 (2000).
- Margetic, V., Bolshov, M., Stockhaus, A., Niemax, K., Hergenroder, R. Depth profiling of multi-layer samples using femtosecond laser ablation. J. Anal. At. Spectrom. 16, 616-621 (2001).
- Cui, Y., Moore, J. F., Milasinovic, S., Liu, Y., Gordon, R. J., Hanley, L. Depth profiling and imaging capabilities of an ultrashort pulse laser ablation time of flight mass spectrometer. Rev. Sci. Instrum. 83, 093702(2012).
- Borowiec, A., MacKenzie, M., Weatherly, G. C., Haugen, H. K. Femtosecond laser pulse ablation of GaAs and InP: Studies utilizing scanning and transmission electron microscopy. Appl. Phys. A. 77, 411-417 (2003).
- Harasaki, A., Schmit, J., Wyant, J. C. Offset of coherent envelope position due to phase change on reflection. Appl. Opt. 40, 2102-2106 (2001).
- Luttge, A., Arvidson, R. S. Reactions at surfaces: A new approach integrating interferometry and kinetic simulations. J. Am. Ceram. Soc. 93, 3519-3530 (2010).
- Conroy, M., Mansfield, D. Scanning interferometry: Measuring microscale devices. Nature Photonics. 2, 661-663 (2008).
- Harasaki, A., Wyant, J. C. Fringe modulation skewing effect in white-light vertical scanning interferometry. Appl. Opt. 39, 2101-2106 (2000).
- Roy, M., Schmit, J., Hariharan, P. White-light interference microscopy: Minimization of spurious diffraction effects by geometric phase-shifting. Opt. Express. 17, 4495-4499 (2009).
Access restricted. Please log in or start a trial to view this content.
Reimpresiones y Permisos
Solicitar permiso para reutilizar el texto o las figuras de este JoVE artículos
Solicitar permisoExplorar más artículos
This article has been published
Video Coming Soon
ACERCA DE JoVE
Copyright © 2025 MyJoVE Corporation. Todos los derechos reservados