Method Article
تقديم SiO2/ Si Surfaces Omniphobic بواسطة نحت مواد دقيقة متشابكة بالغاز تتألف من Reentrant وDoubli Reentrant Cavities أو الأعمدة
In This Article
Summary
يقدم هذا العمل بروتوكولات التصنيع الدقيق لتحقيق التجاويف والأعمدة مع ملامح reentrant وreentrant مضاعفة على رقاقات SiO2/ Si باستخدام التصوير الضوئي والنقش الجاف. تظهر الأسطح الدقيقة الناتجة عن ذلك طاردًا سائلًا ملحوظًا ، يتميز بشرك قوي طويل الأجل للهواء تحت السوائل الرطبة ، على الرغم من قابلية السيليكا الجوهرية للبلل.
Abstract
نحن نقدم بروتوكولات microfabrication لجعل المواد الرطبة في جوهرها طارد ة للسوائل (omniphobic) عن طريق إنشاء مواد دقيقة متشابكة للغاز (GEMs) عليها تتألف من تجاويف وأعمدة مع ميزات reentrant وreentrant مضاعفة. على وجه التحديد ، نستخدم SiO2/ Si كنظام نموذجي ونشارك بروتوكولات التصميم ثنائي الأبعاد (2D) ، والطباعة الضوئية ، وتقنيات النقش isotropic / aisotropic ، ونمو أكسيد الحرارة ، وتنظيف البيرانا ، والتخزين نحو تحقيق تلك الملمسالدقيق. على الرغم من أن الحكمة التقليدية تشير إلى أن الأسطح الرطبة الخشونة في جوهرها(οo < 90°) تجعلها أكثر تبلل(r< ο o < 90 درجة)، فإن GEMs تظهر الطارد السائل على الرغم من القابلية الجوهرية للبلل من الركيزة. على سبيل المثال، على الرغم من القابلية الجوهرية للبلل من السيليكا o - 40° لنظام الماء / الهواء، وo ο 20° لنظام الهكسيديكان/الهواء، GEMs التي تتألف من تجاويف في فخ الهواء بقوة على تلك السوائل، وزوايا الاتصال الظاهرة للقطرات هي r > 90°. تعمل ميزات reentrant وreentrant بشكل مضاعف في GEMs على تثبيت الغضروف المفصلي السائل المتطفل وبالتالي محاصرة نظام البخار السائل الصلب في الولايات المملوءة بالهواء (دول كاسي) وتأخير التحولات الرطبة إلى الحالة المليئة بالحرارة الديناميكية الديناميكية بالكامل (حالة Wenzel) من خلال، على سبيل المثال، من خلال ساعات إلى أشهر. وبالمثل، فإنأسطح SiO 2/Si مع صفائف من الركائز المجهرية الإعادة والمضاعفة تظهر زوايا اتصال عالية للغاية(οr - 150°-160°) ونسبة التهيستير المنخفضة لزاوية الاتصال لسوائل المسبار، وبالتالي توصف بأنها فائقة الرهاب. ومع ذلك ، على الانغماس في نفس السوائل ، تفقد تلك الأسطح بشكل كبير superomniphobicity والحصول على كامل شغلها داخل < 1 s. ولما نتصدى لهذا التحدي، نقدم بروتوكولات للتصاميم الهجينة التي تضم صفائف من أعمدة الإعادة المضاعفة المحاطة بجدران ذات ملامح متضاعفة. في الواقع ، microtextures الهجين فخ الهواء على الغمر في سوائل التحقيق. وخلاصة القول، ينبغي أن تمكن البروتوكولات الموصوفة هنا من التحقيق في تدابير رصد الجودة في سياق تحقيق تعدد الاستخدامات دون طلاء كيميائي، مثل البيرفلوروكربونات، التي قد تفتح نطاق المواد الشائعة غير المكلفة للتطبيقات كمواد متعددة الاستخدامات. يمكن أن تعمل مواد السيليكا الدقيقة أيضًا كقوالب للمواد الناعمة.
Introduction
الأسطح الصلبة التي تظهر زوايا اتصال واضحة، يشار إلى السوائل القطبية وغير القطبية، مثل الماء والهيكساديككان، على أنهامتعددةالاستخدامات. هذه الأسطح تخدم العديد من التطبيقات العملية، بما في ذلك تحلية المياه2،3،فصل المياه النفطية4،5،antibiofouling6،والحد من السحب الهيدروديناميكي7. عادة ، يتطلب تعدد الاستخدامات المواد الكيميائية المفلورة والطبوغرافيات العشوائية8،9،10،11،12. ومع ذلك ، فإن التكلفة ، وعدم التحلل الحيوي ، والضعف من تلك المواد / الطلاء تشكل عددا لا يحصى من القيود ، على سبيل المثال ، أغشية تحلية المياه المفلورة تتحلل مع ارتفاع درجات حرارة جانب الأعلاف ، مما يؤدي إلى التبول المسام13،14، والطلاء المفلور / الهيدروكربوني أيضا الحصول على متآكل15،16 وتدهورت من قبل جزيئات الطمي في تيارات التدفق وبروتوكولات التنظيف. وبالتالي ، هناك حاجة إلى استراتيجيات بديلة لتحقيق وظائف الطلاء المفلور (أي ، ربط الهواء على الغمر في السوائل دون استخدام الطلاء طارد الماء). لذلك ، اقترح الباحثون الطبوغرافيات السطحية المكونة من الميزات المتدلية (reentrant) التي يمكن أن توقع الهواء على الغمر بواسطة microtexturing وحده17،18،19،20،21،22،23،24،25. هذه الأنسجة الدقيقة تأتي في ثلاثة أنواع: تجاويف26، أعمدة27، والحصير ليفي8. فيما يلي ، سنشير إلى ميزات reentrant مع الأعباء البسيطة مثل reentrant(الشكل 1A -B والشكل 1E-F)وميزات reentrant مع الأعباء التي تجعل من 90 درجة نحو القاعدة كـ reentrant مضاعفة(الشكل 1C-D والشكل 1G-H).
في عملهم الرائد ، فيرنر وآخرون22،28،29،30،31 تتميز البشرة من springtails (Collembola) ، المفصليات التي تعيش في التربة ، وأوضح أهمية ملامح على شكل فطر (reentrant) في سياق الترطيب. وقد حققت الآخرين أيضا دور الشعر على شكل فطر في المتزلجين البحر32,33 نحو تسهيل صد المياه المدقع. أظهر فيرنر وزملاء العمل omniphobicity من الأسطح البوليمرية الترطيب الجوهري من خلال نحت هياكل المحاكاة الحيوية من خلال الطباعة الحجرية بصمة عكس29. أفاد ليو وكيم على أسطح السيليكا المزينة بصفائف من أعمدة الإعادة المضاعفة التي يمكن أن تصد قطرات من السوائل مع توترات سطحية منخفضة مثلLV = 10 mN / m ، تتميز بزوايا اتصال واضحة ، r × 150 درجة وزاوية اتصال منخفضة للغاية هيستيريس27 . مستوحاة من هذه التطورات المدهشة، اتبعنا وصفات ليو وكيم لإعادة إنتاج نتائجها. ومع ذلك ، اكتشفنا أن تلك الملمسات الدقيقة ستفقد بشكل كارثي superomniphobicity ، أي r → 0 ° ، إذا كانت قطرات السائل الرطب لامست حافة الملمس الدقيق أو إذا كان هناك ضرر مادي موضعي34. وأظهرت هذه النتائج أن الأنسجة الدقيقة القائمة على الأعمدة غير صالحة للتطبيقات التي تتطلب تعدد الاستخدامات على الغمر، كما شككت في معايير تقييم تعدد الاستخدامات (أي إذا كانت تقتصر على زوايا التلامس وحدها، أو إذا كانت هناك حاجة إلى معايير إضافية).
ردا على ذلك ، وذلك باستخدام رقاقات SiO2/ Si ، قمنا بإعداد صفائف من التجاويف الصغيرة مع مداخل reentrant مضاعفة و ، واستخدام الماء وhexadecane والسوائل القطبية وغير القطبية التمثيلية ، أثبتنا أن (1) هذه الملمسات الدقيقة تمنع السوائل من دخولها عن طريق ربط الهواء ، و (2) الهندسة المعمارية المجزأة للتجاويف يمنع فقدان الهواء المحاصر من قبل العيوب المترجمة34. وهكذا، فقد قمنا بتسميتهما هذه الأنسجة الدقيقة بأنها "مواد صغيرة متشابكة للغاز" (GEMs). كخطوة تالية، نحن microfabricated GEMs مع الأشكال المختلفة (دائرية، مربعة، سداسية) وملامح (بسيطة، reentrant، وreentrant مضاعفة) لمقارنة أدائها بشكل منهجي تحت الغمر في السوائل الرطب26. أنشأنا أيضا microtexture الهجين يضم صفائف من أعمدة reentrant مضاعفة محاطة الجدران مع ملامح reentrant مضاعفة، والتي منعت السوائل من لمس ينبع من الأعمدة والهواء المحاصرين بقوة على الغمر35. أدناه، نقدم بروتوكولات مفصلة لتصنيع GEMs على الأسطح SiO2/ Si من خلال تقنيات الطباعة الحجرية الضوئية والنقش جنبا إلى جنب مع معلمات التصميم. كما نقدم نتائج تمثيلية لتوصيف ترطيبها بالقياس الجنبي لزاوية الاتصال (الزوايا المتقدمة /الانحسار/كما وضعت) والغمر في سداسية والمياه.
Protocol
ملاحظة: تم تصنيع صفائف من التجاويف والأعمدة القابلة لإعادة الدخول وإعادة الدخول بشكل مضاعف من خلال تكييف بروتوكول الخطوات المتعددة للأعمدة التي أبلغ عنها ليو وكيم27. تم اتخاذ الاحتياطات اللازمة لتقليل تكوين بقايا دبوس أو جزيئات على أسطحنا التي يمكن أن تتداخل مع التحولات الرطب36.
التصنيع الدقيق للتجاويف
وعلى نطاق واسع، فإن بروتوكولات التصنيع الدقيق للتجاويف اللاحقة وreentrant بشكل مضاعف (RCs وDRCs) تتكون من تصميم ثنائي الأبعاد، والطباعة الضوئية، ونقش السيليكا العام، ونقش السيليكون المحدد، اعتمادًا على الميزة النهائية المطلوبة37و38و39و40و41.
1. تصميم
- بدء عملية microfabrication من خلال تصميم النمط المطلوب في برنامج تخطيط42. مثال على مثل هذا البرنامج مدرج في قائمة المواد.
- باستخدام البرنامج، قم بإنشاء ملف جديد. رسم خلية وحدة تتألف من دائرة من القطر، D = 200 ميكرومتر. نسخ ولصق هذه الدائرة مع مسافة من مركز إلى مركز (الملعب) من L = 212 μm لإنشاء مجموعة من الدوائر في رقعة مربعة من منطقة 1 سم2 (الشكل 2).
- رسم دائرة قطرها 100 ملم (4 بوصات). ضع الصفيف المربع 1 سم2 داخل الدائرة وتكراره لإنشاء شبكة 4 × 4 من الصفائف المربعة. سيتم نقل الميزات داخل الدائرة إلى رقائق 4 بوصة(الشكل 2).
- تصدير ملف التصميم إلى التنسيق المطلوب لنظام كتابة القناع (على سبيل المثال، تنسيق GDSII).
2. تنظيف الرقائق
- تنظيف رقاقة السيليكون 4 بوصات في القطر، < 100> التوجه، ومع 2.4 ميكرومتر طبقة أكسيد حراري سميك (انظر قائمة المواد)،في محلول البيرانا لمدة 10 دقيقة. محلول بيرانا يتكون من حمض الكبريتيك (H2SO4، 96٪): بيروكسيد الهيدروجين (H2O2، 30 ٪) في نسبة حجمية 3:1 ويتم الاحتفاظ بها عند T = 388 K.
- شطف رقاقة مع الماء deionized وتدور الجافة تحت النيتروجين (N2)البيئة.
3- الطباعة الحجرية الضوئية
- معطف رقاقة مع hexamethyldisilazane (HMDS) باستخدام ترسب مرحلة البخار لتحسين الالتصاق مع مقاومة للضوء. راجع الجدول 1 للحصول على تفاصيل العملية.
- جبل رقاقة على فراغ 4 بوصة تشاك في معطف تدور. تغطية رقاقة مع AZ-5214E مقاومة للضوء. استخدام المغطي تدور لنشر مقاومة للضوء بشكل موحد على السطح كطبقة 1.6 ميكرومتر سميكة. الرجوع إلى الجدول 2 لمعلمات طلاء تدور.
- اخبز الرقاقة المغلفة بمقاومة للضوء على طبق ساخن يتم الحفاظ عليها عند درجة حرارة 110 درجة مئوية مقابل 120 سنة.
- نقل رقاقة إلى نظام الكتابة المباشرة وتعريض رقاقة للأشعة فوق البنفسجية لمدة 55 مللي ثانية (إلغاء التركيز: +5). تنقل هذه الخطوة التصميم المطلوب على AZ-5214E (المستخدم ة في النغمة الإيجابية؛ انظر قائمة المواد)(الشكل 2).
- ضع الرقاقة المكشوفة للأشعة فوق البنفسجية في طبق بيتري زجاجي يحتوي على مطور AZ-726 لمدة 60 عامًا لتطوير الميزات. راجع قائمة المواد للحصول على التفاصيل.
- إزالة رقاقة من حل المطور وشطف مع دي المتأين (DI) المياه بلطف لإزالة المطور الزائد. قم بتجفيف الرقاقة في بيئة N2. وترد هذه الخطوات في الشكل 3A-C.
ملاحظة: في نهاية هذه الخطوة، يمكن رؤية أنماط التصميم على الرقاقة تحت المجهر البصري القياسي.
4. النقش اللاسيوتروبية من السيليكا (SiO2)طبقة
ملاحظة: الهدف من هذه الخطوة هو حفر تماما بعيدا طبقة السيليكا (2.4 ميكرومتر سميكة) التي تعرضت أثناء الطباعة الحجرية الضوئية لفضح طبقة السيليكون تحت.
- بعد التصوير الضوئي، نقل رقاقة إلى البلازما مقرها استقرائي (برنامج المقارنات الدولية) التفاعلي أيون النقش (RIE) النظام الذي يستخدم خليط من أوكتافلوروسيكوكلوبوتان (C4F8)والأكسجين (O2)الغازات إلى السيليكا المحفورة عموديا إلى أسفل (النقش اللاي.
- تشغيل عملية برنامج المقارنات الدولية-RIE لمدة 13 دقيقة تقريبا ً لحفر طبقة السيليكا المكشوفة. الرجوع إلى معلمات ICP-RIE في الجدول 3. خلال هذه الخطوة ، تحصل أيضًا على طبقة مقاومة للضوء محفورة تمامًا(الشكل 3C-D).
- لضمان أن يتم تخفيض سمك طبقة السيليكا داخل الأنماط المطلوبة إلى الصفر ، بحيث يتم كشف طبقة السيليكون ، قم بقياس سمك السيليكا المتبقية باستخدام مقياس انعكاسي. ضبط مدة فترة النقش اللاحقة على أساس سماكة طبقات السيليكا (خاصة في وحول الأنماط).
ملاحظة: تم استخدام مقياس عاكس لقياس سمك طبقة السيليكا المتبقية43. بدلا من ذلك، يمكن أيضا استخدام أدوات أخرى، مثل مقياس المبلي أو مخطط الألوان التفاعلية للتنبؤ لون SiO2 وسمك يمكن أيضا أن تستخدم44،45.
الإجراءات المفصلة في الخطوتين 1 و 4 شائعة لكل من تجاويف الإعادة وreentrant بشكل مضاعف. ومع ذلك ، فإن بروتوكولات النقش لطبقة السيليكون مختلفة ويرد وصفها أدناه:
5. ريفيجن تجاويف
-
النقش السيليكوني اللاي
- بعد حفر طبقة السيليكا، نقل رقاقة إلى نظام عميق برنامج المقارنات الدولية-RIE إلى السيليكون حفر. تتكون الخطوة الأولى من طريقة النقش اللامتساوية القائمة على الفلور المعروفة باسم عملية بوش التي تنقش السيليكون عموديًا إلى الأسفل ، مما يخلق جدارًا مستقيمًا.
ملاحظة: تستخدم عملية بوش غازات C4F8 وسداسي فلوريد الكبريت (SF6)في غرفة التفاعل: يخلق ترسب C4F8 طبقة تخميل ، في حين أن SF6 يحفر السيليكون عموديًا إلى الأسفل. وبالتالي، فإن عملية بوش تمكن من التصنيع الدقيق للخنادق العميقة في السيليكون مع نسب عالية إلى الارتفاع. - تشغيل هذه العملية لمدة خمس دورات، والتي تتوافق مع عمق النقش للسيليكون يعادل 2 μm. يتم سرد معلمات العملية في الجدول 4.
- قم بتنظيف الرقاقة في محلول البيرانا لمدة 10 دقيقة لإزالة أي بقايا من عملية بوش. شطف رقاقة مع ماء DI وتدور الجافة في بيئة N2 (الشكل 3E).
- بعد حفر طبقة السيليكا، نقل رقاقة إلى نظام عميق برنامج المقارنات الدولية-RIE إلى السيليكون حفر. تتكون الخطوة الأولى من طريقة النقش اللامتساوية القائمة على الفلور المعروفة باسم عملية بوش التي تنقش السيليكون عموديًا إلى الأسفل ، مما يخلق جدارًا مستقيمًا.
- النقش السيليكون يُعنى بالنظائر: من أجل إنشاء ميزة reentrant ، قم بإجراء النقش المتساوي الخواص الذي من شأنه أن يخلق طبقة تحت طبقة السيليكا. ويمكن تحقيق 5 μm التراكم عن طريق حفر طبقة السيليكون مع SF6 لمدة 2 دقيقة 45 ق(الشكل 3F). راجع الجدول 5 للاطلاع على معلمات العملية.
-
النقش السيليكوني اللاي: بمجرد إنشاء ميزات reentrant ، قم بضبط عمق التجاويف من خلال عملية بوش (الخطوة 5.1).
ملاحظة: إلى تجاويف microfabricate مع عمق حج • 50 ميكرومتر، 160 دورات من عملية بوش مطلوبة(الشكل 3G، الجدول 4). -
تنظيف و تخزين الرقاقة
- تنظيف رقاقة باستخدام حل البيرانا كما هو موضح في الخطوة 2. بعد هذه الخطوة ، يصبح الرقاقة هيدروفيلية فائقة ، تتميز بزوايا الاتصال من الماء ، و0 درجة.
- تخزين رقاقة في طبق بيتري الزجاج ومكان داخل فرن فراغ نظيفة في T = 323 K والضغط فراغ PVac = 3.3 كيلو باسكال لمدة 48 ساعة، وبعد ذلك زاوية الاتصال الجوهرية من طبقة السيليكا يستقر إلى40 درجة.
- تخزين العينات في خزانة نظيفة مجهزة النيتروجين الخارجي (99٪) تدفق، وعلى استعداد لمزيد من التوصيف.
6. تجاويف Reentrant Doubly
- النقش السيليكوني اللاي: لإنشاء تجاويف reentrant مضاعفة، اتبع الخطوات 1 و 2 و 3 و 4 و 5.1 (انظر الشكل 4A-E).
-
النقش السيليكون يُزوّر
من أجل إنشاء ميزات reentrant مضاعفة ، يجب إنشاء ميزات reentrant أولاً. لتحقيق ذلك، أداء النقش متساوي الخواص لإنشاء أسفل تحت طبقة السيليكا. حفر طبقة السيليكون مع SF6 لمدة 25 سنة(الشكل 4F). راجع الجدول 5 للاطلاع على معلمات العملية. في وقت لاحق، تنظيف رقاقة باستخدام محلول البيرانا كما هو موضح في الخطوة 2. -
نمو أكسيد حراري
- لتحقيق ميزات reentrant مضاعفة، وتنمو طبقة 500 نانومتر من أكسيد الحرارية على رقاقة، وذلك باستخدام نظام الفرن درجة حرارة عالية(الشكل 4G).
- قياس سمك طبقة أكسيد باستخدام مقياس العاكسة.
ملاحظة: تم إجراء الأكسدة عن طريق تعريض العينات لبيئة تتألف من الأكسجين (O2)وبخار الماء، مما يؤدي إلى أكسدة السيليكون الرطب ة في بيئة مغلقة عند درجات حرارة تتراوح بين 800-1200 درجة مئوية.
- نقش السيليكا: تنفيذ نفس العملية كما هو موضح في الخطوة 4 إلى السيليكا حفر عموديا إلى أسفل لمدة 3 دقيقة. نتيجة للنقش اللاإستوتروبي، أكسيد الحرارية (500 نانومتر طبقة سميكة السيليكا) محفورة بعيدا عن تجويف، لكنه يترك "العبء" على طول الجدران الجانبية التي من شأنها أن تشكل حافة reentrant مضاعفة في نهاية المطاف(الشكل 4H، الجدول 3).
- النقش السيليكوني اللاي: كرر خمس دورات من عملية بوش لتعميق التجاويف بنسبة 2 ميكرومتر(الشكل 4I، الجدول 5). هذه الخطوة ضرورية لإزالة السيليكون وراء ميزة reentrant مضاعفة في الخطوة التالية. تنظيف رقاقة باستخدام محلول البيرانا.
- النقش السيليكون يُعنى بالنظائر: تنفيذ النقش متساوي الخواص من السيليكون لمدة 2 دقيقة و 30 s باستخدام معلمات العملية الموضحة في الجدول 4. تخلق هذه الخطوة مساحة فارغة (2 ميكرومتر) خلف أكسيد التجويف المزروع حراريًا ، مما يؤدي إلى حافة الاستجابة المضاعفة(الشكل 4J).
- النقش السيليكوني اللاي: استخدم وصفة عملية بوش (الخطوة 5.1) لـ 160 دورة لزيادة عمق التجاويف إلى hc - 50 ميكرومترًا ،(الشكل 4K، الجدول 5).
- تنظيف و تخزين الرقاقة: تنظيف رقاقة باستخدام حل البيرانا وتخزينها على النحو المبين في الخطوة 5.4 أعلاه.
التلفيق الدقيق للركيزةS
يتكون بروتوكول التصميم لتصنيع أعمدة الإعادة و "الهجينة" (التي تتألف من أعمدة reentrant مضاعفة محاطة بالجدران) من ثلاث خطوات رئيسية: إعداد الرقاقة ، ونقش السيليكا ، ونقش السيليكون المحدد. يعرض الشكل 5A-C العرض العلوي لتصميم التخطيط لأعمدة الإعادة وإعادة الدخول بشكل مضاعف، في حين يمثل الشكل 5D-F تخطيط الصفائف الهجينة. حدد خيار الحقل المظلم للتعرض للأشعة فوق البنفسجية من أجل كشف الرقاقة بأكملها باستثناء النمط الذي يستخدم نفس مقاومة الضوئية (AZ5214E)(الشكل 6A-C والشكل 7A-C). وإلى جانب هذه الخصائص، فإن عمليات تنظيف الرقاقة (الخطوة 2) والنقش السيليكا (الخطوة 4) متطابقة.
7- أعمدة الإعادة
- النقش السيليكوني اللاي: بعد التصوير الضوئي، والتعرض للأشعة فوق البنفسجية، والتنمية، ونقش السيليكا مع خصائص الأعمدة المذكورة أعلاه (الخطوات 1-4)، نقل رقاقة إلى نظام عميق ICP-RIE لحفر طبقة السيليكون باستخدام عملية بوش. تتحكم هذه الخطوة في ارتفاع الأعمدة. استخدام 160 دورة من عملية بوش لتحقيق ركائز الارتفاع، حP ☆ 30 ميكرومتر(الشكل 6E، الجدول 5). تنظيف رقاقة كما هو موضح في الخطوة 2.
- النقش السيليكون يُعنى بالنظائر: تنفيذ النقش متساوي الخواص باستخدام SF6 لمدة 5 دقيقة لإنشاء حافة reentrant على الأعمدة(الشكل 6F، الجدول 4). الطول الناتج عن التراكم هو 5 ميكرومتر.
- البيرانا التنظيف والتخزين: تنظيف رقاقة باستخدام حل البيرانا وتخزينها على النحو المبين في الخطوة 5.4 أعلاه.
8. أعمدة Reentrant والهجينة
- النقش السيليكوني اللاي: بعد حفر SiO2، نقل رقاقة إلى نظام عميق برنامج المقارنات الدولية - RIE إلى حفر سي تحت طبقة SiO2. قم بإجراء خمس دورات من عملية بوش التي تتوافق مع عمق محفور قدره 2 ميكرومتر(الشكل 7E، الجدول 4). بعد ذلك، قم بتنظيف الرقاقة كما هو موضح في الخطوة (2).
- النقش السيليكون يُعنى بالنظائر: تنفيذ النقش متساوي الخواص باستخدام SF6 لمدة 16 s لإنشاء حافة reentrant(الجدول 5، الشكل 7F). تنظيف رقاقة كما هو موضح في الخطوة 2.
- نمو أكسيد حراري: تنمو 500 نانومتر طبقة من أكسيد الحرارية في جميع أنحاء رقاقة باستخدام نظام الفرن درجة حرارة عالية كما هو موضح في الخطوة 6.3(الشكل 7G).
- نقش السيليكا: حفر طبقة أكسيد نمت حراريا (500 نانومتر سميكة) لمدة 3 دقيقة كما هو موضح في الخطوة 6.4(الشكل 7H، الجدول 3).
- النقش السيليكوني اللاي: كرر 160 دورة من عملية بوش(الجدول 4)لزيادة ارتفاع الأعمدة(الشكل 7I). تنظيف رقاقة كما هو موضح في الخطوة 2 أعلاه.
- النقش السيليكون يُعنى بالنظائر: إجراء النقش المتساوي الخواص للسيليكون لمدة 5 دقيقة باستخدام معلمات العملية كما هو موضح في الجدول 4. هذه الخطوة بإنشاء حافة reentrant مضاعفة(الشكل 7J). المسافة بين جذع العمود وحافة الإعادة المضاعفة هي 2 ميكرومتر.
- تنظيف و تخزين الرقاقة: تنظيف رقاقة باستخدام حل البيرانا وتخزينها على النحو المبين في الخطوة 5.4 أعلاه.
يمثل الشكل 8 قائمة العمليات المستخدمة في التجاويف والأعمدة المصطنعة الدقيقة وإعادة الشراء بشكل مضاعف.
النتائج
في هذا القسم، نعرض تجاويف reentrant وreentrant بشكل مضاعف (RCs وDRCs، الشكل 9)وأعمدة reentrant وreentrant بشكل مضاعف (RPs وDRPs، الشكل 10)microfabricated باستخدام البروتوكولات المذكورة أعلاه. جميع التجاويف لديها القطر، DC = 200 ميكرومتر، العمق، حC × 50 ميكرومتر، والمسافة من المركز إلى المركز (أو الملعب) بين التجاويف المجاورة لتكون LC = DC + 12 ميكرومتر. باستخدام بروتوكولات التصنيع نفسها ، يمكن أيضًا إعداد تجاويف الأشكال غير الدائرية ، كما تم الإبلاغ عنها سابقًا26.
كان قطر الغطاء فوق الأعمدة D P = 20 ميكرومترًا ، وكان ارتفاعها والملعب ، على التوالي ، حp - 30 ميكرومترًا و LP = 100 ميكرومتر(الشكل 10).
السلوكيات الرطبة للنسيج الدقيق المنشّق للغاز (GEMs)
السيليكا المسطحة (SiO2)تبلل في جوهرها نحو معظم السوائل القطبية وغير القطبية. على سبيل المثال، كانت زوايا الاتصال الجوهرية لقطرات الهكذيكان(lv = 20 mN/m عند 20 درجة مئوية) والمياه (التوتر السطحي= 72.8 مل/م عند 20 درجة مئوية) على السيليكا، على التوالي، وo - 20 درجةوo × 40 درجة. ومع ذلك ، بعد microfabricating reentrant وتجاويف reentrant مضاعفة (DRCs) والأعمدة ، تغيرت زوايا الاتصال بشكل كبير(الجدول 6). قمنا بقياس زوايا الاتصال المتقدمة / الانحسار عن طريق الاستغناء / سحب السوائل بمعدل 0.2 ميكرولتر / الثانية ووجدنا زوايا الاتصال الظاهرة لكلا السائلين ، r> 120 درجة ، (omniphobic ؛ الشكل 11E). انحسار زوايا الاتصال، rο ο 0° بسبب عدم وجود انقطاع في microtextures، كما هو الحال في microtextures المستندة إلى عمود. من ناحية أخرى ، SiO2/ Si السطوح مع صفائف من أعمدة reentrant مضاعفة (DRPs) أظهرت زوايا اتصال واضحة ، وr > 150 درجة لكلا السوائل وزاوية الاتصال هيستيريس كان الحد الأدنى (superomniphobic ، الشكل 11ألف والأفلام S1 و S2). الغريب ، عندما كانت مغمورة نفس السطوح SiO2/ Si مع صفائف من الأعمدة في نفس السوائل التي حصلت على متطفل على الفور ، ر < 1 s ، أي لم يكن في فخ الهواء(الشكل 10A - D، فيلم S3). لذا ، في حين أن الأعمدة بدت فائقة الرهاب من حيث زوايا الاتصال ، إلا أنها فشلت في إيقاع الهواء في الانغماس. في الواقع ، تبلل السوائل تتدخل من حدود microtexture (أو من عيوب موضعية) وتحل محل أي الهواء المحاصرين على الفور(الشكل 11A - D والفيلم S3). وعلى النقيض من ذلك، حاصرت مراكز البحث عن بعد الهواء عند الانغماس في كلا السائلين(الشكل 11E-H و S1، الجدول 1)؛ لhexadecane، وكان الهواء المحاصرين سليمة حتى بعد 1 شهر26. أظهرت تجارب المجهر المتجانس لدينا أن الميزات المتدلية تعمل على استقرار السوائل المتطفلة والهواء في الفخ داخلها(الشكل 12A-B).
بعد ذلك ، لإيقاع الهواء في صفائف من DRPs ، قمنا باستخدام نفس بروتوكولات التصنيع الدقيق لتحقيق صفائف من الأعمدة محاطة بجدران من ملف تعريف reentrant مضاعف(الشكل 10G-I). وقد عزلت هذه الاستراتيجية سيقان هذه السوائل من السوائل الرطبة. ونتيجة لذلك ، فإن microtextures الهجين ة التي تم تصويرها كما GEMs ، كما أكد ذلك التنظير المجهري(الشكل 12C -D)وMovie S4 ، الجدول 6). وهكذا ، أظهرت أسطح السيليكا مع microtextures الهجين omniphobicity على الغمر عن طريق محاصرة الهواء وأظهرت زوايا الاتصال ، وr > 120 درجة ، (omniphobic) ، وثبت omniphobic بالمعنى الحقيقي ، أي من حيث زوايا الاتصال ومحاصرة الهواء على الغمر. في الجدول 6، نقوم بتقييم الأسطح المتعددة الاستخدامات لـ SiO2/ Si مع مجموعة متنوعة من التجويف الدقيق القائم ، القائم على الأعمدة ، والهجينة من خلال زوايا الاتصال والغمر.
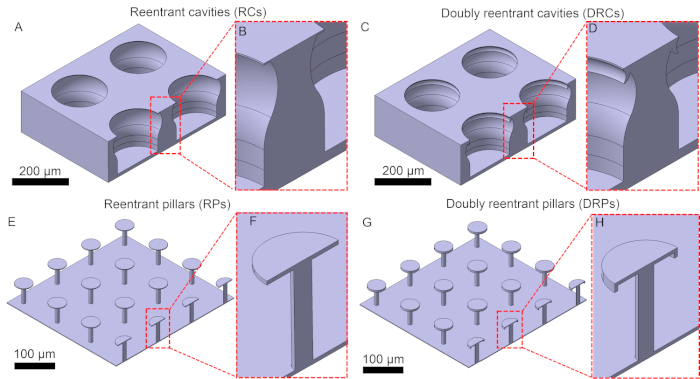
الشكل 1: مخططات الهياكل المجهرية. (أ–ب) تجاويف الراتنج،(C-D)تجاويف الإعادة المضاعفة،(E-F)أعمدة الإعادة،(G-H)أعمدة الإعادة المضاعفة. يرجى الضغط هنا لعرض نسخة أكبر من هذا الرقم.
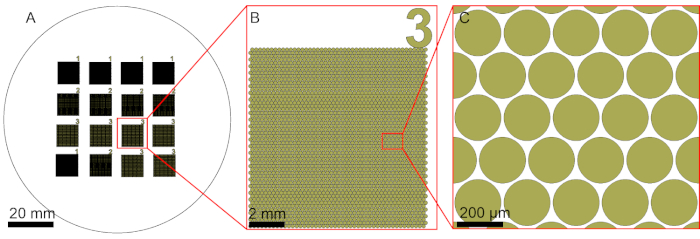
الشكل 2: أنماط التصميم للتجاويف. أنماط التصميم لreentrant ومضاعفة reentrant تجاويف ولدت باستخدام برنامج التخطيط. تم نقل النمط على الرقاقة باستخدام الطباعة الحجرية الضوئية. يرجى الضغط هنا لعرض نسخة أكبر من هذا الرقم.

الشكل 3: بروتوكول التصنيع الدقيق لتسوس الراتنج. (أ)تنظيف رقاقة السيليكون مع 2.4 ميكرومتر السيليكا سميكة على القمة. (ب)سبين معطف رقاقة مع مقاومة للضوء وفضح للضوء الأشعة فوق البنفسجية. (C)تطوير الأشعة فوق البنفسجية يتعرض مقاومة للضوء للحصول على نمط التصميم. (د)نقش طبقة السيليكا العليا المكشوفة عمودياً إلى الأسفل (النقش غير المتساوي الخواص) باستخدام البلازما المقترنة باستقرائي (ICP) الحفر التفاعلي أيون (RIE). (E)النقش اللاي متساوي الخواص الضحل لطبقة السيليكون المكشوفة باستخدام برنامج المقارنات الدولية العميق- RIE. (واو)النقش الايزوتروبيك من السيليكون لخلق حافة reentrant. (ز)حفر السيليكون اللاإستوتروبيا العميق لزيادة عمق التجاويف. يرجى الضغط هنا لعرض نسخة أكبر من هذا الرقم.
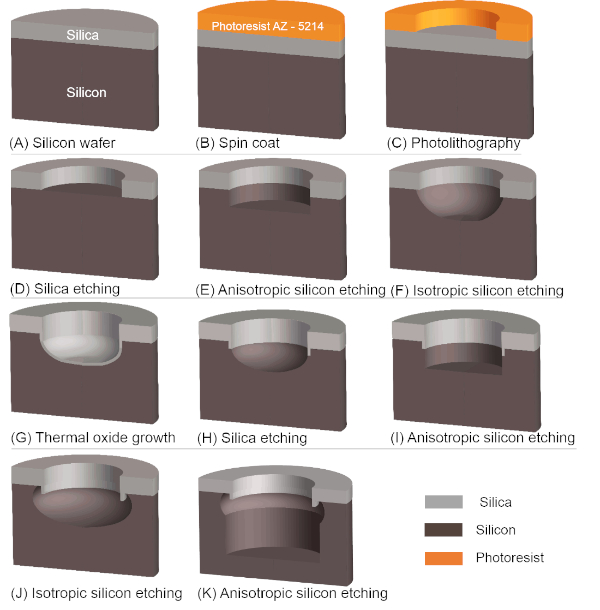
الشكل 4: بروتوكول التصنيع الدقيق للتجاويف المضاعفة. (أ)تنظيف رقاقة السيليكون مع 2.4 ميكرومتر السيليكا سميكة على القمة. (ب)سبين معطف رقاقة مع مقاومة للضوء وفضح للضوء الأشعة فوق البنفسجية. (C)تطوير الأشعة فوق البنفسجية يتعرض مقاومة للضوء للحصول على نمط التصميم. (د)نقش طبقة السيليكا العليا المكشوفة عمودياً إلى الأسفل (النقش غير المتساوي الخواص) باستخدام البلازما المقترنة باستقرائي (ICP) الحفر التفاعلي أيون (RIE). (E)النقش اللاي متساوي الخواص الضحل لطبقة السيليكون المكشوفة باستخدام برنامج المقارنات الدولية العميق- RIE. (F)النقش المتساوي الضحل ة من السيليكون لخلق undercut باستخدام عميق برنامج المقارنات الدولية - ري. (ز)نمو أكسيد حراري. (H)النقش اللاي من طبقة السيليكا أعلى وأسفل. (I)النقش اللاي السيسوتروبي الضحل للسيليكون. (J)Isotropic السيليكون حفر لخلق حافة reentrant مضاعف. (ك)حفر السيليكون اللاإستوتروبيا العميق لزيادة عمق التجاويف. يرجى الضغط هنا لعرض نسخة أكبر من هذا الرقم.

الشكل 5: أنماط التصميم للأعمدة. أنماط التصميم للأعمدة الإعادة والإعادة المضاعفة والهجينة التي تم إنشاؤها باستخدام برنامج التخطيط. تم نقل النمط على الرقاقة باستخدام الطباعة الحجرية الضوئية. يرجى الضغط هنا لعرض نسخة أكبر من هذا الرقم.
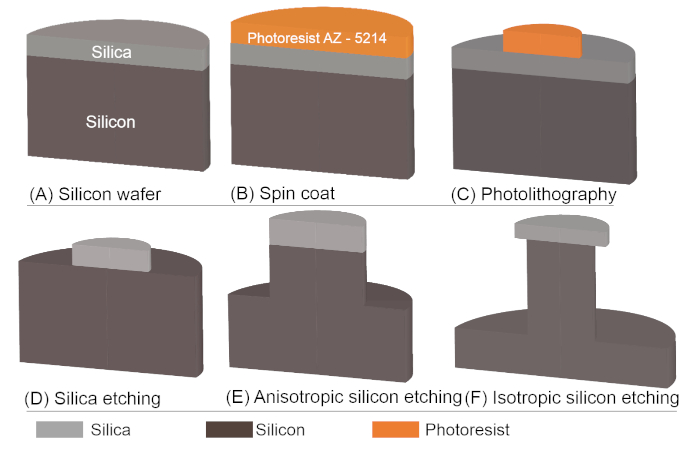
الشكل 6: بروتوكول التصنيع الدقيق لأعمدة الإعادة. (أ)تنظيف رقاقة السيليكون مع 2.4 ميكرومتر السيليكا سميكة على القمة. (ب)سبين معطف رقاقة مع مقاومة للضوء وفضح للضوء الأشعة فوق البنفسجية. (C)تطوير الأشعة فوق البنفسجية يتعرض مقاومة للضوء للحصول على نمط التصميم. (د)نقش طبقة السيليكا العليا المكشوفة عمودياً إلى الأسفل (النقش غير المتساوي الخواص) باستخدام البلازما المقترنة باستقرائي (ICP) الحفر التفاعلي أيون (RIE). (E)حفر السيليكون اللاإستوتروبيا العميق لزيادة ارتفاع الأعمدة. (واو)النقش السيليكون ISOtropic لخلق حافة reentrant. يرجى الضغط هنا لعرض نسخة أكبر من هذا الرقم.
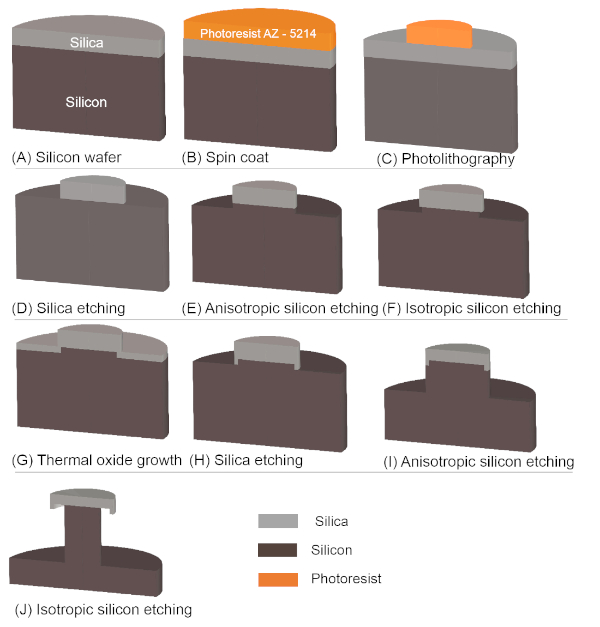
الشكل 7: بروتوكول التلفيق الدقيق لركائز الإعادة المضاعفة. (أ)تنظيف رقاقة السيليكون مع 2.4 ميكرومتر السيليكا سميكة على القمة. (ب)سبين معطف رقاقة مع مقاومة للضوء وفضح للضوء الأشعة فوق البنفسجية. (C)تطوير الأشعة فوق البنفسجية يتعرض مقاومة للضوء للحصول على نمط التصميم. (د)نقش طبقة السيليكا العليا المكشوفة عمودياً إلى الأسفل (النقش غير المتساوي الخواص) باستخدام البلازما المقترنة باستقرائي (ICP) الحفر التفاعلي أيون (RIE). (E)النقش اللاي متساوي الخواص الضحل لطبقة السيليكون المكشوفة باستخدام برنامج المقارنات الدولية العميق- RIE. (F)النقش المتساوي الضحل ة من السيليكون لخلق undercut باستخدام عميق برنامج المقارنات الدولية - ري. (ز)نمو أكسيد حراري. (H)النقش اللاي من أعلى وأسفل طبقة السيليكا. (I)النقش السيليكون اللاي لزيادة ارتفاع الأعمدة. (J)النقش السيليكون Isotropic لخلق حافة reentrant مضاعف. لاحظ أن الفرق الوحيد بين أعمدة reentrant مضاعفة و "الهجين" هو التصميم في البداية. يرجى الضغط هنا لعرض نسخة أكبر من هذا الرقم.

الشكل 8: بروتوكول التصنيع الدقيق للتجاويف والأعمدة الإعادة المضاعفة وإعادة الدخول. يسرد المخطط الانسيابي الخطوات الرئيسية المعنية. يرجى الضغط هنا لعرض نسخة أكبر من هذا الرقم.
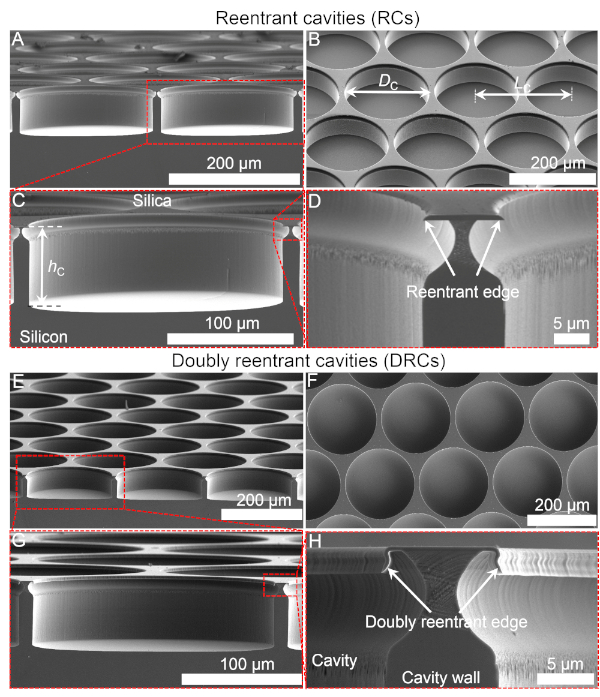
الشكل 9: المسح الضوئي للميكروغرافيات الإلكترونية للتجاويف الراتنجية والمزدوج. (A-D) عرض عرضي للأسطح السيليكا مع مجموعة من التجاويف reentrant. (E-H) عرض مقطعي وأعلى من تجاويف reentrant مضاعفة. DC = قطر التجويف وLC = المسافة من المركز إلى المركز بين التجاويف المجاورة (أو الملعب) ، وhC = عمق التجويف. يرجى الضغط هنا لعرض نسخة أكبر من هذا الرقم.
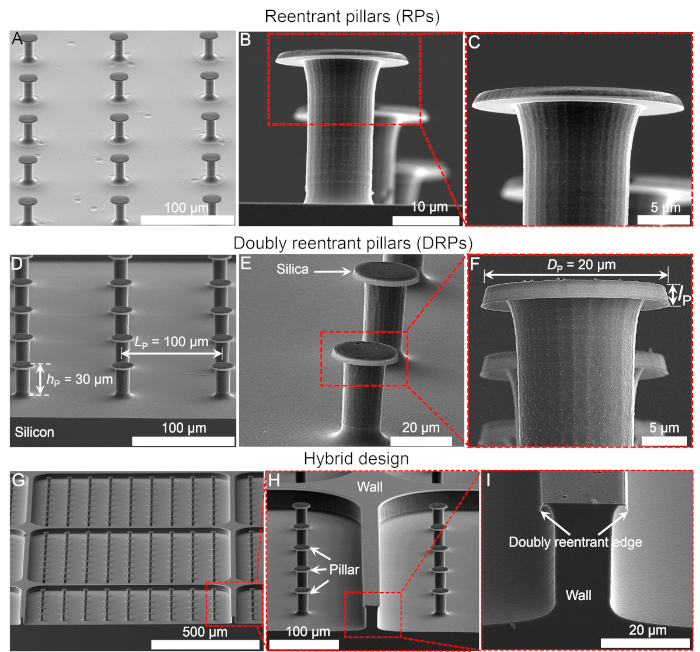
الشكل 10: المسح المجهري الإلكتروني للأعمدة الإعادة وإعادة الراتنج بشكل مضاعف. (A-C) عرض متساوي القياس لركائز الإعادة. (D-F) أعمدة reentrant بشكل مضاعف. (G-I) أعمدة هجينة - DRPs محاطة بجدران reentrant مضاعفة. DP - قطر غطاء العمود و LP - المسافة من المركز إلى المركز بين الأعمدة المجاورة (أو الملعب)، وhP - ارتفاع الأعمدة. الشكل دال–أنا، أعيد طبعها من المرجع35، حقوق الطبع والنشر (2019) ، بإذن من إلسفير. يرجى الضغط هنا لعرض نسخة أكبر من هذا الرقم.

الشكل 11: سلوك التبول. (أ)Superomniphobicity من الأسطح SiO2/ Si مزينة صفائف أعمدة reentrant مضاعفة، لوحظ عن طريق وضع قطرات السائل على القمة. (B-D) يتم فقدان superomniphobicity على الفور، إذا السوائل الرطبة تلمس الحدود أو عيوب موضعية. (E)SiO2/ Si الأسطح مزينة صفائف تجاويف reentrant مضاعفة يحمل omniphobicity. (F-H) هذه microtextures فخ الهواء بقوة ولا تفقد إذا السائل يمس الحدود أو عيوب مترجمة. أعيد طبعها من المرجع35، حقوق الطبع والنشر (2019) ، بإذن من إلسفير. يرجى الضغط هنا لعرض نسخة أكبر من هذا الرقم.

الشكل 12: المجهر التكوّر من الملمس الدقيق المغمور بالسوائل. إعادة بناء 3D المحسنة بالكمبيوتر من الصور التفكيكية التمثيلية (متساوي القياس والمقاطع العرضية على طول الخطوط المنقط) من التحولات الرطبة في أسطح السيليكا مع تجاويف reentrant مضاعفة وأعمدة هجينة مغمورة تحت عمود z ☆ 5 ملم بعد 5 دقيقة من الغمر من (A،C) الماء ، و (B،D) سداسية. الألوان الزرقاء والصفراء (كاذبة) تتوافق مع واجهات الماء وhexadecane مع الهواء المحاصرين. استقرت menisci السائل المتطفل على حافة reentrant مضاعف. (مقياس شريط = قطر تجويف وعمود 200 ميكرومتر و 20 ميكرون على التوالي). تمت إعادة طباعة الشكل 12 من المرجع35، حقوق الطبع والنشر (2019) ، بإذن من إلسفير. يرجى الضغط هنا لعرض نسخة أكبر من هذا الرقم.
| المرحلة الأولى: الجفاف وتطهير الأكسجين من الغرفة | ||
| خطوه | تسلسل العملية | الوقت (دقيقة) |
| 1 | فراغ (10 تور) | 1 |
| 2 | النيتروجين (760 تور) | 3 |
| 3 | فراغ (10 تور) | 1 |
| 4 | النيتروجين (760 تور) | 3 |
| 5 | فراغ (10 تور) | 1 |
| 6 | النيتروجين (760 تور) | 3 |
| المرحلة الثانية: الفتيلة | ||
| تسلسل العملية | الوقت (دقيقة) | |
| 7 | فراغ (1 تور) | 2 |
| 8 | HMDS (6 تور) | 5 |
| المرحلة الثالثة: تطهير العادم رئيس الوزراء | ||
| تسلسل العملية | الوقت (دقيقة) | |
| 9 | فراغ | 1 |
| 10 | النيتروجين | 2 |
| 11 | فراغ | 2 |
| المرحلة الرابعة: العودة إلى الغلاف الجوي (الردم) | ||
| تسلسل العملية | الوقت (دقيقة) | |
| 12 | النيتروجين | 3 |
الجدول 1: تفاصيل عملية طلاء طبقات سداسي ميثيل ديسيلتازان (HMDS) لتعزيز الالتصاق بين سطح السيليكا ومقاومة ضوئية AZ-5214E.
| خطوه | السرعة (دورة في الدقيقة) | منحدر (دورة في الدقيقة / s) | الوقت (s) |
| 1 | 800 | 1000 | 3 |
| 2 | 1500 | 1500 | 3 |
| 3 | 3000 | 3000 | 30 |
الجدول 2: تفاصيل العملية لتحقيق 1.6 ميكرومتر سميكة AZ-5214E طبقة مقاومة للضوء على SiO2/ Si رقاقات عن طريق طلاء تدور.
| RF الطاقة، (W) | قوة برنامج المقارنات الدولية، (W) | حفر الضغط، (mTorr) | C4F8 تدفق (sccm) | O2 تدفق (sccm) | درجة الحرارة، (°C) |
| 100 | 1500 | 10 | 40 | 5 | 10 |
الجدول 3: إعدادات المعلمة لنقش السيليكا المستخدمة في البلازما المقترنة استقرائيًا - النقش التفاعلي أيون (ICP-RIE).
| RF الطاقة، (W) | قوة برنامج المقارنات الدولية، (W) | حفر الضغط، (mTorr) | SF6 تدفق، (sccm) | درجة الحرارة، (°C) |
| 20 | 1800 | 35 | 110 | 15 |
الجدول 4: إعدادات المعلمة لنقش السيليكون (متساوي الخواص) المستخدمة في البلازما المقترنة باستقرائيا - النقش الأيوني التفاعلي العميق (ICP-DRIE).
| خطوه | RF الطاقة، (W) | قوة برنامج المقارنات الدولية، (W) | حفر الضغط، (mTorr) | SF6 تدفق، (sccm) | C4F8 تدفق، (sccm) | درجة الحرارة، (°C) | الترسيب/ وقت النقش، (s) |
| طبقة التخميل | 5 | 1300 | 30 | 5 | 100 | 15 | 5 |
| النقش | 30 | 1300 | 30 | 100 | 5 | 15 | 7 |
الجدول 5: إعدادات المعلمة لنقش السيليكون (غير متساوي الأبعاد) المستخدمة في البلازما المقترنة باستقرائيا - النقش الأيوني التفاعلي العميق (ICP-DRIE).
| الاسطح | المعيار: زوايا الاتصال في الهواء | المعيار: الانغماس | |||
| المياه | هيكساديكين | المياه | هيكساديكين | ||
| خطط الحد من الفقر | r | 153 درجة ± 1 درجة | 153 درجة ± 1° | الاختراق الفوري | الاختراق الفوري |
| A | 161 درجة ± 2 درجة | 159 درجة ± 1° | |||
| R | 139 درجة ± 1 درجة | 132 درجة ± 1° | |||
| تقييم: | سوبرماينبيبيا | ليست omniphobic – في الواقع، omniphilic | |||
| مراكز الحد من مخاطر الكوارث | r | 124 درجة ± 2° | 115 درجة ± 3° | الهواء المحاصر (متعدد الاستخدامات) | الهواء المحاصر (متعدد الاستخدامات) |
| A | 139 درجة ± 3° | 134 درجة ± 5° | |||
| R | 0 درجة | 0 درجة | |||
| تقييم: | متعدد الاستخدامات | متعدد الاستخدامات | |||
| الهجينه | r | 153 درجة ± 2 درجة | 153 درجة ± 2° | الهواء المحاصر (متعدد الاستخدامات) | الهواء المحاصر (متعدد الاستخدامات) |
| A | 161 درجة ± 2 درجة | 159 درجة ± 2° | |||
| R | 0 درجة | 0 درجة | |||
| تقييم: | متعدد الاستخدامات | متعدد الاستخدامات | |||
الجدول 6: قياسات زاوية الاتصال - التقدم(A)، الانحسار(οR)، والظاهر(οr)- والغمر في السوائل. تمت إعادة طباعة هذا الجدول من المرجع35، حقوق الطبع والنشر (2019) ، بإذن من إلسفير.
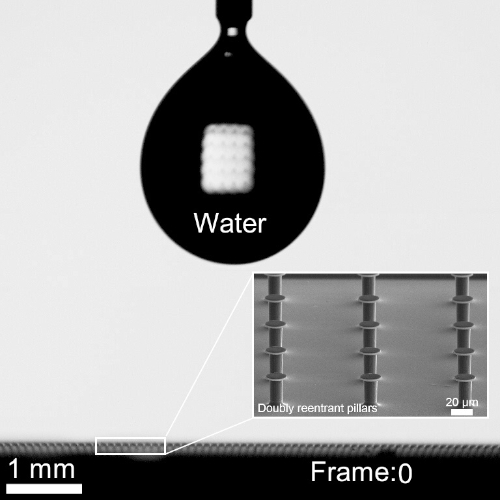
الفيلم S1: تسلسل الصورة عالية السرعة (15K إطارا في الثانية) من قطرات الماء كذاب من الأسطح microtextured تتألف من أعمدة reentrant مزدوجة. تمت إعادة طباعة هذا الفيلم من المرجع 35. حقوق الطبع والنشر (2019)، بإذن من إلسفير. يرجى الضغط هنا لعرض هذا الفيديو (انقر على اليمين للتحميل).
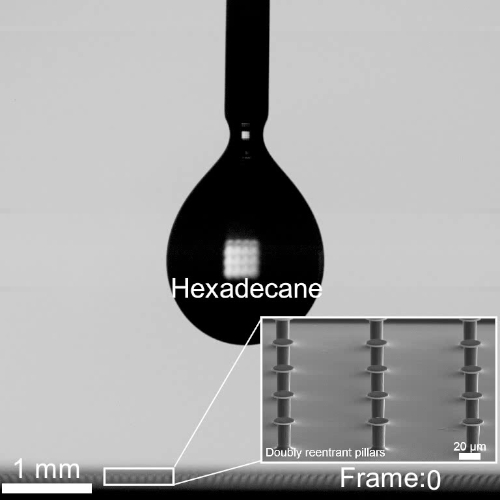
الفيلم S2: تسلسل الصورة عالية السرعة (19K إطارا في الثانية) من قطرات سداسية الكذاب من الأسطح microtextured تتألف من أعمدة reentrant مزدوجة. تمت إعادة طباعة هذا الفيلم من المرجع 35. حقوق الطبع والنشر (2019)، بإذن من إلسفير. يرجى الضغط هنا لعرض هذا الفيديو (انقر على اليمين للتحميل).
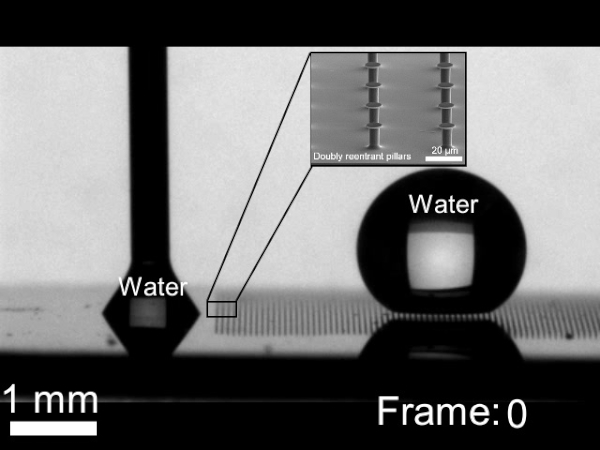
فيلم S3: تسلسل الصورة (200 fps) من التطبيب المياه في microtexture تتألف من أعمدة reentrant مزدوجة. تمت إعادة طباعة هذا الفيلم من المرجع 35. حقوق الطبع والنشر (2019)، بإذن من إلسفير. يرجى الضغط هنا لعرض هذا الفيديو (انقر على اليمين للتحميل).
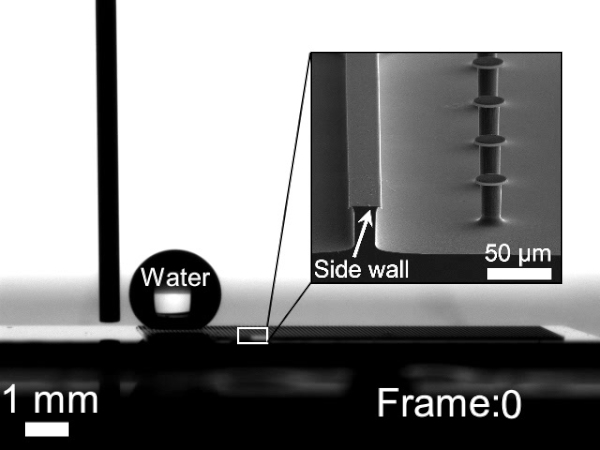
الفيلم S4: تسلسل الصورة (200 إطارا في الثانية) قطرة الماء تتقدم بجانب microtexture الهجين. وجود جدار الحدود reentrant مضاعفة يمنع الغزو السائل في microtexture، مما يجعل سطح omniphobic تحت الغمر أيضا. تمت إعادة طباعة هذا الفيلم من المرجع 35. حقوق الطبع والنشر (2019)، بإذن من إلسفير. يرجى الضغط هنا لعرض هذا الفيديو (انقر على اليمين للتحميل).
Discussion
هنا نناقش عوامل إضافية ومعايير التصميم لمساعدة القارئ في تطبيق هذه البروتوكولات microfabrication. بالنسبة للميكروميكسات التجويفية (RCs و DRCs) فإن اختيار الملعب أمر بالغ الأهمية. إن أنحف الجدران بين التجاويف المجاورة تؤدي إلى انخفاض منطقة الجوانب السائلة الصلبة البينية والمنطقة العالية بين الوجهيين السائلة وبخار هاوية، مما يؤدي إلى زوايا اتصال واضحة عالية34. ومع ذلك، يمكن للجدران الرقيقة أن تعرض السلامة الميكانيكية للنسيج الدقيق للخطر، على سبيل المثال، أثناء المناولة والتوصيف؛ القليل من المحفورات مع الجدران الرقيقة (على سبيل المثال ، في الخطوة 6.6) يمكن أن تدمر الملمس الدقيق بأكمله ؛ تحت النقش مع جدران رقيقة يمكن أيضا منع تطوير ميزات reentrant مضاعف. إذا لم يتم تطوير ميزات جمهورية الكونغو الديمقراطية بشكل كامل ، فقد تعاني قدرتها على إيقاع الهواء على المدى الطويل ، خاصة إذا كان السائل يتكثف داخل التجاويف26. لهذا السبب، اخترنا الملعب في تجاربنا ليكون L = D + 12 ميكرومتر (أي أن الحد الأدنى لسمك الجدار بين التجاويف كان 12 ميكرون). قمنا أيضًا بتصنيع تجاويف reentrant مضاعفة مع درجة أصغر من L = D + 5 μm ، ولكن الأسطح الناتجة لم تكن متجانسة بسبب الضرر الهيكلي أثناء التصنيع الدقيق.
أثناء نقش طبقة السيليكا مع C4F8 و O2 في الخطوة 4 ، يمكن أن يعطي التاريخ السابق للاستخدام أو نظافة غرفة التفاعل نتائج متغيرة ، على الرغم من اتباع نفس الخطوات ، على سبيل المثال ، في منشأة مستخدم مشتركة كما هو الحال في معظم الجامعات. وبالتالي ، فمن المستحسن أن يتم تنفيذ هذه الخطوة في فترات زمنية قصيرة ، على سبيل المثال ، لا يزيد عن 5 دقيقة لكل منها ورصد سمك طبقة السيليكا من خلال تقنية مستقلة ، مثل قياس الانعكاس. بالنسبة للرقائق التي لدينا مع طبقة سيليكا بسماكة 2.4 ميكرومتر ، استغرق روتين النقش النموذجي 13 دقيقة لإزالة السيليكا تمامًا من المناطق المستهدفة(الجدول 3). لأن مقاومة الصور كانت محفورة أيضا خلال هذه العملية، هذه الخطوة إزالة 1 ميكرومتر من طبقة السيليكا التي كانت في البداية ملثمين من قبل مقاومة للضوء. وعلاوة على ذلك، ولضمان أن يكون معدل النقش كما هو متوقع، ولتجنب التلوث المتبادل من عمليات الحفر السابقة (وهي مسألة شائعة في المرافق المتعددة المستخدمين)، كان النقش بالسيليكا يسبقه دائماً نقش رقاقة أضاحي كخطوة احترازية. أثناء تطور مقاومة للضوء ، قد يتم تلوث السطح المكشوف بآثار / جزيئات مقاومة للضوء ، والتي يمكن أن تكون بمثابة أقنعة (مجهرية) تؤدي إلى تكوين بقايا دبوس. لتجنب ذلك ، يجب اتباع بروتوكولات التنظيف والتخزين الصارمة طوال عملية التصنيع الدقيق36.
وبالمثل ، خلال عملية بوش ، على الرغم من أن طبقة SiO2 بمثابة قناع لطبقة Si تحتها ، فإنها تحصل على حفر خلال دورات الحفر الطويلة ، وإن كان ذلك بمعدلات أبطأ. وبالتالي ، فإن عمق التجاويف أو ارتفاع الأعمدة محدود لدرجة أن ميزات الإعادة لن تتعرض للخطر. يجب ضبط أوقات التخميل والنقش أثناء عملية بوش للحصول على جدران ناعمة. ويمكن تحقيق ذلك عن طريق اختبار وصفات تكرارية ومراقبة آثارها على العينات، على سبيل المثال، باستخدام المجهر الإلكتروني.
في حالة RPs وDRPs ، كلما طالت مدة النقش المتساوي الخواص ، كان قطر الجذع أصغر. إذا كان القطر أقل من 10 ميكرومتر، فقد يؤدي ذلك إلى هشاشة ميكانيكية. يجب أن يُعلم هذا القيد التصميم في بداية إجراء التصنيع الدقيق.
أدوات الحفر الجاف المتاحة عادة في الجامعات ليس لديها التحمل من الدرجة الصناعية، مما يؤدي إلى اللاتوحيد المكاني من حيث معدل النقش داخل الغرفة. وبالتالي، قد لا تكون الميزات التي تم الحصول عليها في وسط الرقاقة هي نفسها تلك الموجودة على الحدود. وللتغلب على هذا القيد، استخدمنا رقائق بطول أربعة بوصات وتركزنا فقط في المنطقة الوسطى.
نوصي أيضًا باستخدام أنظمة الكتابة المباشرة بدلاً من استخدام أقنعة الاتصال الثابت للطباعة الحجرية الضوئية ، مما يسمح بالتغييرات السريعة في معلمات التصميم ، بما في ذلك أقطار الميزات والملاعب والأشكال (دائرية وسداسية ومربعة) ، وما إلى ذلك.
من الواضح أنه لا SiO2/ Si رقاقات ولا الطباعة الحجرية الضوئية هي المواد أو العمليات المطلوبة للإنتاج الضخم للأسطح الكارهة للفهو. ومع ذلك ، فهي بمثابة نظام نموذجي ممتاز لاستكشاف microtextures مبتكرة لهندسة الأسطح omniphobic ، على سبيل المثال من قبل biomimetics26،27،34،35،46،47، والتي يمكن ترجمتها إلى أنظمة المواد منخفضة التكلفة وقابلة للتطوير للتطبيقات. ومن المتوقع أن في المستقبل القريب، يمكن توسيع نطاق مبادئ التصميم لGEMs باستخدام تقنيات مثل الطباعة ثلاثية الأبعاد48،والتصنيع المضاف49،والليزر micromachining50،من بين أمور أخرى. Microtextured SiO2/ Si السطوح يمكن أيضا أن تستخدم للمواد لينة templating29،51. حاليا، ونحن نحقق في تطبيقات الأسطح لدينا الغاز المربوطة للتخفيف من تلف التجويف47،تحلية46،52،والحد من السحب الهيدروديناميكي.
Disclosures
ويعلن صاحبا البلاغ أنه ليس لديهما مصالح متنافسة.
Acknowledgements
صاحبة الجلالة تقر بالتمويل من جامعة الملك عبد الله للعلوم والتقنية.
Materials
| Name | Company | Catalog Number | Comments |
| AZ-5214 E photoresist | Merck | DEAA070796-0W59 | Photoresist, flammable liquid |
| AZ-726 MIF developer | Merck | 10055824960 | To develop photoresist |
| Confocal microscopy | Zeiss | Zeiss LSM710 | Upright confocal microscope to visualize liquid meniscus shape |
| Deep ICP-RIE | Oxford Instruments | Plasmalab system100 | Silicon etching tool |
| Direct writer | Heidelberg Instruments | µPG501 | Direct-writing system |
| Drop shape analyzer | KRUSS | DSA100 | To measure contact angle |
| Hexadecane | Alfa Aesar | 544-76-3 | Test liquid |
| Highspeed imaging camera | Phantom vision research | v1212 | To image droplet bouncing |
| HMDS vapor prime | Yield Engineering systems | ||
| Hot plate | Cost effective equipments | Model 1300 | |
| Hydrogen peroxide 30% | Sigma Aldrich | 7722-84-1 | To prepare piranha solution |
| Imaris software | Bitplane | Version 8 | Post process confocal microscopy images |
| Nile Red | Sigma Aldrich | 7385-67-3 | Fluorescent dye for hexadecane |
| Nitrogen gas | KAUST lab supply | To dry the wafer | |
| Petri dish | VWR | HECH41042036 | |
| Reactive-Ion Etching (RIE) | Oxford Instruments | Plasmalab system100 | Silica etching tool |
| Reflectometer | Nanometrics | Nanospec 6100 | To check remaining oxide layer thickness |
| Rhodamine B (Acros) | Fisher scientific | 81-88-9 | Fluorescent dye for water |
| SEM stub | Electron Microscopy Sciences | 75923-19 | |
| SEM-Quanta 3D | FEI | Quanta 3D FEG Dual Beam | |
| Silicon wafer | Silicon Valley Microelectronics | Single side polished, 4" diameter, 500 µm thickness, 2.4 µm thick oxide layer | |
| Spin coater | Headway Research,Inc | PWM32 | |
| Spin rinse dryer | MicroProcess technology | Avenger Ultra -Pure 6 | Dry the wafers after piranha clean |
| Sulfuric acid 96% | Technic | 764-93-9 | To prepare piranha solution |
| Tanner EDA L-Edit software | Tanner EDA, Inc. | version15 | Layout design |
| Thermal oxide growth | Tystar furnace | To grow thermal oxide in patterned silicon wafer | |
| Tweezers | Excelta | 490-SA-PI | Wafer tweezer |
| Vacuum oven | Thermo Scientific | 13-258-13 | |
| Water | Milli-Q | Advantage A10 | Test liquid |
References
- Butt, H. J., et al. Characterization of super liquid-repellent surfaces. Current Opinion in Colloid & Interface Science. 19 (4), 343-345 (2014).
- Lee, J., Laoui, T., Karnik, R. Nanofluidic transport governed by the liquid/vapour interface. Nature Nanotechnology. 9 (4), 317-323 (2014).
- Subramanian, N., et al. Evaluating the potential of superhydrophobic nanoporous alumina membranes for direct contact membrane distillation. Journal of Colloid and Interface Science. 533, 723-732 (2019).
- Xue, Z. X., Cao, Y. Z., Liu, N., Feng, L., Jiang, L. Special wettable materials for oil/water separation. Journal of Materials Chemistry A. 2 (8), 2445-2460 (2014).
- Zhang, L. B., Zhong, Y. J., Cha, D., Wang, P. A self-cleaning underwater superoleophobic mesh for oil-water separation. Scientific Reports. 3, (2013).
- Leslie, D. C., et al. A bioinspired omniphobic surface coating on medical devices prevents thrombosis and biofouling. Nature Biotechnology. 32 (11), 1134-1140 (2014).
- Lee, C., Choi, C. H., Kim, C. J. Superhydrophobic drag reduction in laminar flows: a critical review. Experiments in Fluids. 57 (176), (2016).
- Tuteja, A., Choi, W., Mabry, J. M., McKinley, G. H., Cohen, R. E. Robust omniphobic surfaces. Proceedings of the National Academy of Sciences of the United States of America. 105 (47), 18200-18205 (2008).
- Brown, P. S., Bhushan, B. Mechanically durable, superoleophobic coatings prepared by layer-by-layer technique for anti-smudge and oil-water separation. Scientific Reports. 5, (2015).
- Wong, T. S., et al. Bioinspired self-repairing slippery surfaces with pressure-stable omniphobicity. Nature. 477 (7365), 443-447 (2011).
- Milionis, A., Dang, K., Prato, M., Loth, E., Bayer, I. Liquid repellent nanocomposites obtained from one-step water-based spray. Journal of Materials Chemistry A. 3 (24), 12880-12889 (2015).
- Mishra, H., et al. Time-Dependent Wetting Behavior of PDMS Surfaces with Bioinspired, Hierarchical Structures. ACS Applied Materials & Interfaces. 8 (12), 8168-8174 (2016).
- Hendren, Z. D., Brant, J., Wiesner, M. R. Surface modification of nanostructured ceramic membranes for direct contact membrane distillation. Journal of Membrane Science. 331 (12), 1-10 (2009).
- Rezaei, M., et al. Wetting phenomena in membrane distillation: Mechanisms, reversal, and prevention. Water Research. 139, 329-352 (2018).
- Verho, T., et al. Mechanically Durable Superhydrophobic Surfaces. Advanced Materials. 23, 673-678 (2011).
- Boinovich, L., Emelyanenko, A. M., Pashinin, A. S. Analysis of Long-Term Durability of Superhydrophobic Properties under Continuous Contact with Water. ACS Applied Materials & Interfaces. 2 (6), 1754-1758 (2010).
- Herminghaus, S. Roughness-induced non-wetting. Europhysics Letters. 52 (2), 165-170 (2000).
- Abdelsalam, M. E., Bartlett, P. N., Kelf, T., Baumberg, J. Wetting of regularly structured gold surfaces. Langmuir. 21 (5), 1753-1757 (2005).
- Liu, J. L., Feng, X. Q., Wang, G. F., Yu, S. W. Mechanisms of superhydrophobicity on hydrophilic substrates. Journal of Physics-Condensed Matter. 19 (35), (2007).
- Nosonovsky, M. Multiscale roughness and stability of superhydrophobic biomimetic interfaces. Langmuir. 23 (6), 3157-3161 (2007).
- Marmur, A. From hygrophilic to superhygrophobic: Theoretical conditions for making high-contact-angle surfaces from low-contact-angle materials. Langmuir. 24 (14), 7573-7579 (2008).
- Hensel, R., et al. Wetting Resistance at Its Topographical Limit: The Benefit of Mushroom and Serif T Structures. Langmuir. 29 (4), 1100-1112 (2013).
- Bormashenko, E. Progress in understanding wetting transitions on rough surfaces. Advances in Colloid and Interface Science. 222, 92-103 (2015).
- Patankar, N. A. Thermodynamics of trapping gases for underwater superhydrophobicity. Langmuir. 32 (27), 7023-7028 (2016).
- Kaufman, Y., et al. Simple-to-Apply Wetting Model to Predict Thermodynamically Stable and Metastable Contact Angles on Textured/Rough/Patterned Surfaces. The Journal of Physical Chemistry C. 121 (10), 5642-5656 (2017).
- Domingues, E. M., Arunachalam, S., Nauruzbayeva, J., Mishra, H. Biomimetic coating-free surfaces for long-term entrapment of air under wetting liquids. Nature Communications. 9 (1), 3606 (2018).
- Liu, T. Y., Kim, C. J. Turning a surface superrepellent even to completely wetting liquids. Science. 346 (6213), 1096-1100 (2014).
- Hensel, R., Neinhuis, C., Werner, C. The springtail cuticle as a blueprint for omniphobic surfaces. Chemical Society Reviews. 45 (2), 323-341 (2016).
- Hensel, R., et al. Biologically Inspired Omniphobic Surfaces by Reverse Imprint Lithography. Advanced Materials. 26 (13), 2029-2033 (2014).
- Hensel, R., et al. Tunable nano-replication to explore the omniphobic characteristics of springtail skin. Npg Asia Materials. 5, (2013).
- Helbig, R., Nickerl, J., Neinhuis, C., Werner, C. Smart Skin Patterns Protect Springtails. PLOS ONE. 6 (9), 25105 (2011).
- Cheng, L. Marine and Freshwater Skaters: Differences in Surface Fine Structures. Nature. 242, 132 (1973).
- Andersen, N. M., Cheng, L. The marine insect Halobates (Heteroptera: Gerridae): biology, adaptations, distribution, and phylogeny. Oceanography and marine biology: an annual review. 42, 119-180 (2004).
- Domingues, E. M., Arunachalam, S., Mishra, H. Doubly Reentrant Cavities Prevent Catastrophic Wetting Transitions on Intrinsically Wetting Surfaces. ACS Applied Materials & Interfaces. 9 (25), 21532-21538 (2017).
- Arunachalam, S., Das, R., Nauruzbayeva, J., Domingues, E. M., Mishra, H. Assessing omniphobicity by immersion. Journal of Colloid and Interface Science. 534, 156-162 (2019).
- Christian Koch, E. A. . Photolithography: Basics of Microstructuring. , (2017).
- Jansen, H., de Boer, M., Legtenberg, R., Elwenspoek, M. The black silicon method: a universal method for determining the parameter setting of a fluorine-based reactive ion etcher in deep silicon trench etching with profile control. Journal of Micromechanics and Microengineering. 5 (2), 115 (1995).
- Jansen, H. V., de Boer, M. J., Unnikrishnan, S., Louwerse, M., Elwenspoek, M. C. Black silicon method X: a review on high speed and selective plasma etching of silicon with profile control: an in-depth comparison between Bosch and cryostat DRIE processes as a roadmap to next generation equipment. Journal of Micromechanics and Microengineering. 19 (3), 033001 (2009).
- Xiu, Y., Zhu, L., Hess, D. W., Wong, C. Hierarchical silicon etched structures for controlled hydrophobicity/superhydrophobicity. Nano Letters. 7 (11), 3388-3393 (2007).
- Azeredo, B., et al. Silicon nanowires with controlled sidewall profile and roughness fabricated by thin-film dewetting and metal-assisted chemical etching. Nanotechnology. 24 (22), 225305 (2013).
- Coffinier, Y., et al. Preparation of superhydrophobic silicon oxide nanowire surfaces. Langmuir. 23 (4), 1608-1611 (2007).
- . L-Edit-The layout editor. Reference Manual Available from: https://usermanual.wiki/Document/LEdit20Manual.38314693/view (2009)
- . NANOSPEC 6100 Series Operators Users Manual Available from: https://cmi.epfl.ch/metrology/Nanospec_AFT6100_Manual.pdf (2019)
- Deal, B. E., Grove, A. General relationship for the thermal oxidation of silicon. Journal of Applied Physics. 36 (12), 3770-3778 (1965).
- Woollam, J. A., et al. Spectroscopic ellipsometry from the vacuum ultraviolet to the far infrared. AIP Conference Proceedings. 550 (1), 511-518 (2001).
- Das, R., Arunachalam, S., Ahmad, Z., Manalastas, E., Mishra, H. Bio-inspired gas-entrapping membranes (GEMs) derived from common water-wet materials for green desalination. Journal of Membrane Science. , 117185 (2019).
- Gonzalez-Avila, S. R., Nguyen, D. M., Arunachalam, S., Domingues, E. M., Mishra, H., Ohl, C. D. Mitigating cavitation erosion using biomimetic gas-entrapping microtextured surfaces. Science Advances. , (2020).
- Liu, X., et al. 3D Printing of Bioinspired Liquid Superrepellent Structures. Advanced Materials. 30 (22), 1800103 (2019).
- Jafari, R., Cloutier, C., Allahdini, A., Momen, G. Recent progress and challenges with 3D printing of patterned hydrophobic and superhydrophobic surfaces. The International Journal of Advanced Manufacturing Technology. , 1-14 (2019).
- Vorobyev, A. Y., Guo, C. L. Multifunctional surfaces produced by femtosecond laser pulses. Journal of Applied Physics. 117 (3), 033103 (2015).
- Xu, M., Kim, C. J. Method for manufacturing re-entrant microstructures. US Patent App. , (2018).
- Das, R., Arunachalam, S., Ahmad, Z., Manalastas, E., Syed, A., Buttner, U., Mishra, H. Proof-of-Concept for Gas-Entrapping Membranes Derived from Water-Loving SiO2/Si/SiO2 Wafers for Greener Desalination. Journal of Visualized Experiments. , e60583 (2020).
Reprints and Permissions
Request permission to reuse the text or figures of this JoVE article
Request PermissionExplore More Articles
This article has been published
Video Coming Soon
Copyright © 2025 MyJoVE Corporation. All rights reserved