Method Article
Rendern von SiO2/Si Oberflächen Omniphobic durch Schnitzen von Gas-Entrapping Mikrotexturen bestehend reentrant und doppelt reentrant Hohlräume oder Säulen
In diesem Artikel
Zusammenfassung
Diese Arbeit präsentiert Mikrofabrikationsprotokolle zur Erzielung von Hohlräumen und Säulen mit reentranten und doppelt reentranten Profilen auf SiO2/Si-Wafern mittels Photolithographie und Trockenätzung. Die resultierenden mikrotexturierten Oberflächen zeigen eine bemerkenswerte Flüssigkeitsabstoßung, die sich trotz der intrinsischen Benetzbarkeit von Kieselsäure durch eine robuste Langzeiteinschlussvon Luft unter Benetzungsflüssigkeiten auszeichnet.
Zusammenfassung
Wir präsentieren Mikrofertigungsprotokolle zur Wiederaufnetzung von Materialien, die flüssigkeitsabweisend (omniphob) sind, indem wir gaseinschlüsse Mikrotexturen (GEMs) erstellen, die Hohlräume und Säulen mit reentranten und doppelt reentranten Eigenschaften enthalten. Insbesondere verwenden wir SiO2/Si als Modellsystem und teilen Protokolle für zweidimensionales (2D) Design, Photolithographie, isotrope/anisotrope Ätztechniken, thermisches Oxidwachstum, Piranha-Reinigung und Lagerung zur Erreichung dieser Mikrotexturen. Auch wenn die gängige Meinung darauf hindeutet, dass das Audecken von anträchtig benetzenden Oberflächen(o< 90°) sie noch benetzender macht(r< o< 90°), zeigen GEMs trotz der intrinsischen Benetzbarkeit des Substrats eine flüssigkeitsabweisende Abstoßung. Zum Beispiel, trotz der intrinsischen Benetzbarkeit von Kieselsäure -o - 40° für das Wasser/Luft-System, und 20° für das Hexadecan/Luftsystem, HMs, die Hohlräume enthalten, die Luft beim Eintauchen in diese Flüssigkeiten robust einfangen, und die scheinbaren Kontaktwinkel für die Tröpfchen sind sr > 90°. Die reentranten und doppelt wiedereintretenden Merkmale in den GEMs stabilisieren den eindringenden flüssigen Meniskus und fangen so das Flüssig-Fest-Dampf-System in metastabilen luftgefüllten Zuständen (Cassie-Zustände) ein und verzögern benetzende Übergänge in den thermodynamisch stabilen Vollfüllzustand (Wenzel-Zustand) um z.B. Stunden bis Monate. Ebenso weisen SiO2/Si-Oberflächenmit Arrays von wiedereintretenden und doppelt wiedereintretenden Mikrosäulen extrem hohe Kontaktwinkel(150°–160°) und eine geringe Kontaktwinkelhysterese für die Sondenflüssigkeiten auf, die daher als superomniphob charakterisiert werden. Beim Eintauchen in die gleichen Flüssigkeiten verlieren diese Oberflächen jedoch dramatisch ihre Superphobie und werden innerhalb von <1 s voll gefüllt. Um dieser Herausforderung gerecht zu werden, präsentieren wir Protokolle für Hybriddesigns, die Arrays von doppelt wiedereintretenden Säulen umfassen, die von Wänden mit doppelt reentranten Profilen umgeben sind. Tatsächlich fangen hybride Mikrotexturen Luft beim Eintauchen in die Sondenflüssigkeiten ein. Zusammenfassend lässt sich sagen, dass die hier beschriebenen Protokolle die Untersuchung von GEMs im Zusammenhang mit der Erreichung der Omniphobizität ohne chemische Beschichtungen wie Perfluorkohlenwasserstoffe ermöglichen sollten, die den Umfang kostengünstiger gängiger Materialien für Anwendungen als omniphobe Materialien freisetzen könnten. Kieselsäure-Mikrotexturen könnten auch als Vorlagen für weiche Materialien dienen.
Einleitung
Feste Oberflächen, die scheinbare Kontaktwinkel aufweisen,r> 90° für polare und unpolare Flüssigkeiten wie Wasser und Hexadecan, werden als omniphobe1bezeichnet. Diese Oberflächen dienen zahlreichen praktischen Anwendungen, einschließlich Wasserentsalzung2,3, Öl-Wasser-Trennung4,5, Antibiofouling6, und Verringerung der hydrodynamischen Luftwiderstand7. Typischerweise erfordert Omniphobizität perfluorierte Chemikalien und zufällige Topographien8,9,10,11,12. Die Kosten, die Nicht-Biologischabbaubarkeit und die Anfälligkeit dieser Materialien/Beschichtungen stellen jedoch eine Vielzahl von Einschränkungen dar, z. B. werden perfluorierte Entsalzungsmembranen abgebaut, wenn die Vorschubtemperaturen erhöht werden, was zu Porenbenetzung13,14und perfluorierten/kohlenwasserstoffbeschichtungen führt, die ebenfalls15,16 abgerieben und durch Schlickpartikel in den Strömungsströmen abgebaut werden. Daher sind alternative Strategien erforderlich, um die Funktionen von perfluorierten Beschichtungen zu erreichen (d. h. Luft beim Eintauchen in Flüssigkeiten einzufangen, ohne wasserabweisende Beschichtungen zu verwenden). Daher haben Forscher Oberflächentopographien vorgeschlagen, die aus überhängenden (reentranten) Merkmalen bestehen, die Luft beim Eintauchen durch Mikrotexturierung allein einfangen könnten17,18,19,20,21,22,23,24,25. Diese Mikrotexturen gibt es in drei Arten: Hohlräume26, Säulen27und faserige Matten8. Im Folgenden beziehen wir uns auf wiedereintretende Features mit einfachen Überhängen als Wiedereintritt (Abbildung 1A–B und Abbildung 1E–F) und wiedereintretende Features mit Überhängen, die eine 90°-Wende zur Basis als doppelt reentrant machen (Abbildung 1C–D und Abbildung 1G–H).
In ihrer Pionierarbeit charakterisierten Werner et al.22,28,29,30,31 Nagelhaut von Federschwänzen (Collembola), bodenbewohnende Arthropoden und erklärten die Bedeutung pilzförmiger (reentranter) Merkmale im Zusammenhang mit der Benetzung. Andere haben auch die Rolle von pilzförmigen Haaren in Seeskater32,33 untersucht, um extreme Wasserabstoßung zu erleichtern. Werner und Kollegen demonstrierten die Allphobizität der intrinsisch benetzenden polymeren Oberflächen, indem sie biomimetische Strukturen durch Reverse-Imprint-Lithographie29schnitzten. Liu und Kim berichteten über Kieselsäureoberflächen, die mit Arrays doppelt reentranter Säulen geschmückt waren, die Flüssigkeitstropfen mit Oberflächenspannungen von biszu 10 mN/m abstoßen konnten, die sich durch scheinbare Kontaktwinkel, 150° und extrem niedrige Kontaktwinkelhysterese27auszeichnen. Inspiriert von diesen erstaunlichen Entwicklungen, folgten wir den Rezepten von Liu und Kim, um ihre Ergebnisse zu reproduzieren. Wir entdeckten jedoch, dass diese Mikrotexturen katastrophal ihre Superphobie verlieren würden, d.h. r0°, wenn benetzende Flüssigkeitstropfen den Rand der Mikrotextur berührten oder wenn lokalisierte physische Schäden34. Diese Ergebnisse zeigten, dass säulenbasierte Mikrotexturen für Anwendungen ungeeignet waren, die Omniphobizität beim Eintauchen erforderten, und sie stellten auch die Kriterien für die Beurteilung der Omniphobizität in Frage (d. h. sollten sie sich nur auf Kontaktwinkel beschränken oder zusätzliche Kriterien erforderlich sind).
Als Reaktion darauf haben wir mit den SiO2/Si-Wafern Arrays von Mikrokadenhohlräumen mit doppelt reentranten Einlässen vorbereitet und unter Verwendung von Wasser und Hexadecan als repräsentativen polaren und unpolaren Flüssigkeiten gezeigt, dass (i) diese Mikrotexturen verhindern, dass Flüssigkeiten durch einziehende Luft in sie eindringen, und (ii) die unterteilte Architektur der Hohlräume den Verlust der eingeschlossenen Luftverhindert. Daher haben wir diese Mikrotexturen als "gas-entrapping microtextures" (GEMs) bezeichnet. Als nächsten Schritt haben wir GEMs mit unterschiedlichen Formen (kreisförmig, quadratisch, sechseckig) und Profile (einfach, reentrant und doppelt reentrant) mikrofabriziert, um ihre Leistung unter Demtauchgang in Benetzungsflüssigkeiten systematisch zu vergleichen26. Wir haben auch eine hybride Mikrotextur geschaffen, die aus Arrays doppelt reentranter Säulen besteht, die von Wänden mit doppelt reentranten Profilen umgeben sind, die verhinderten, dass Flüssigkeiten die Stiele der Säulen berührten und beim Eintauchen35robust eingeschlossene Luft eingeschlossen wurden. Im Folgenden stellen wir detaillierte Protokolle für die Herstellung von GEMs auf SiO2/Si-Oberflächen durch Photolithographie und Ätztechniken sowie Konstruktionsparameter vor. Wir präsentieren auch repräsentative Ergebnisse der Charakterisierung ihrer Benetzung durch Kontaktwinkelgoniometrie (Vorrücken/Zurückgehen/Als platzierte Winkel) und Eintauchen in Hexadecan und Wasser.
Protokoll
HINWEIS: Arrays von reentranten und doppelt wiedereintretenden Hohlräumen und Säulen wurden durch die Anpassung des mehrstufigen Protokolls für Säulen, die von Liu und Kim27gemeldet wurden, mikrofabriziert. Es wurden Vorkehrungen getroffen, um die Bildung von Stiftrückständen oder Partikeln auf unseren Oberflächen zu minimieren, die die Benetzungsübergänge stören könnten36.
MIKROFERTIGUNG VON HOHLRÄUMEN
Im Großen und Ganzen bestehen die Protokolle für die Mikrofertigung von reentranten und doppelt reentranten Hohlräumen (RCs und DRCs) aus zweidimensionalem Layout-Design, Photolithographie, allgemeiner Kieselsäureätzung und spezifischer Siliziumätzung, je nach dem erforderlichen Endmerkmal37,38,39,40,41.
1. Design
- Starten Sie den Mikrofertigungsprozess, indem Sie das erforderliche Muster in einer Layoutsoftwareentwerfen 42. Ein Beispiel für eine solche Software ist in der Materiallisteaufgeführt.
- Erstellen Sie mit der Software eine neue Datei. Zeichnen Sie eine Einheitszelle, die aus einem Kreis des Durchmessers besteht, D = 200 m. Kopieren und fügen Sie diesen Kreis mit einem Mittleren-Zu-Mitte-Abstand (Pitch) von L = 212 m ein Array von Kreisen in einem quadratischen Fleck von Fläche 1 cm2 (Abbildung 2) zu erstellen.
- Zeichnen Sie einen Kreis mit einem Durchmesser von 100 mm (4 Zoll). Platzieren Sie das 1 cm2 quadratische Array innerhalb des Kreises und replizieren Sie es, um ein 4 x 4 Raster mit quadratischen Arrays zu erstellen. Features innerhalb des Kreises werden auf die 4-Zoll-Wafer übertragen (Abbildung 2).
- Exportieren Sie die Entwurfsdatei in das gewünschte Format für das Maskenschreibsystem (z. B. das GDSII-Format).
2. Reinigung von Wafern
- Reinigen Sie einen Siliziumwafer 4 Zoll im Durchmesser, <100> Ausrichtung, und mit einer 2,4 m dicken thermischen Oxidschicht (siehe Materialliste), in Piranha-Lösung für 10 min. Piranha-Lösung besteht aus Schwefelsäure (H2SO4, 96%): Wasserstoffperoxid (H2O2, 30%) in einem Volumenverhältnis von 3:1 und wird bei T = 388 K gehalten.
- Spülen Sie den Wafer mit entionisiertem Wasser und spintrocknen unter Stickstoff (N2) Umgebung.
3. Photolithographie
- Beschichten Sie den Wafer mit Hexamethyldisilazan (HMDS) mit Dampfphasenabscheidung, um die Haftung mit dem Photoresist zu verbessern. Die Prozessdetails finden Sie in Tabelle 1.
- Montieren Sie den Wafer auf einem 4-Zoll-Vakuumfutter im Spincoater. Bedecken Sie den Wafer mit dem AZ-5214E Photoresist. Verwenden Sie den Spincoater, um den Photoresist gleichmäßig auf der Oberfläche als 1,6 m dicke Schicht zu verteilen. Siehe Tabelle 2 für Spin-Beschichtungsparameter.
- Backen Sie den photoresistbeschichteten Wafer auf einer Bei 110 °C gehaltenen Kochplatte für 120 s.
- Übertragen Sie den Wafer auf ein Direktschreibsystem und setzen Sie den Wafer für 55 ms UV-Strahlung aus (Defokus: +5). In diesem Schritt wird das gewünschte Design auf dem AZ-5214E übertragen (im positiven Ton verwendet; siehe Materialliste) (Abbildung 2).
- Legen Sie den UV-belichteten Wafer in eine glasierte Petrischale mit dem AZ-726-Entwickler für 60 s, damit die Features entwickelt werden können. Weitere Informationen finden Sie in der Materialliste.
- Entfernen Sie den Wafer aus der Entwicklerlösung und spülen Sie mit deionisiertem (DI) Wasser vorsichtig ab, um überschüssige Entwickler zu entfernen. Drehen Sie den Wafer in einer N 2-Umgebung. Diese Schritte sind in Abbildung 3A–Cdargestellt.
HINWEIS: Am Ende dieses Schritts können Designmuster auf dem Wafer unter einem optischen Standardmikroskop gesehen werden.
4. Anisotrope Radierung von Kieselsäure (SiO2) Schicht
HINWEIS: Das Ziel dieses Schritts ist es, die Kieselsäureschicht (2,4 m dick), die während der Photolithographie freigelegt wurde, vollständig abzuätzen, um die darunter liegende Siliziumschicht freizulegen.
- Nach der Photolithographie den Wafer in ein induktiv gekoppeltes Plasma(ICP) Reaktiv-Ionen-Ätzsystem (RIE) übertragen, das eine Mischung aus Octafluorcyclobutan(C4F8) und Sauerstoff(O2) Gasen verwendet, um Kieselsäure vertikal nach unten zu ätzen (anisotrope Ätzung).
- Führen Sie den ICP-RIE-Prozess ca. 13 min aus, um die freiliegende Kieselsäureschicht zu ätzen. Siehe die ICP-RIE-Parameter in Tabelle 3. In diesem Schritt wird auch die photoresist-Schicht vollständig weggeätzt (Abbildung 3C-D).
- Um sicherzustellen, dass die Kieselschichtdicke innerhalb der gewünschten Muster auf Null reduziert wird, so dass die Siliziumschicht freigelegt wird, messen Sie die Dicke der verbleibenden Kieselsäure mit einem Reflektometer. Passen Sie die Dauer der nachfolgenden Ätzperiode basierend auf den Dicken der Kieselsäureschichten (insbesondere in und um die Muster) an.
HINWEIS: Ein Reflektometer wurde verwendet, um die Dicke der verbleibenden Kieselsäureschicht43zu messen. Alternativ können auch andere Werkzeuge wie das Ellipsometer oder ein interaktives Farbdiagramm zur Vorhersage der Farbe von SiO2 und der Dicke verwendet werden44,45.
Die in den Schritten 1 und 4 beschriebenen Verfahren sind sowohl für wiedereintretende als auch für doppelt wiedereintretende Hohlräume üblich. Die Ätzprotokolle für die Siliziumschicht unterscheiden sich jedoch und werden im Folgenden beschrieben:
5. Reentrant Hohlräume
-
Anisotrope Siliziumätzung
- Nach dem Ätzen der Kieselsäureschicht den Wafer in ein tiefes ICP-RIE-System auf Ätzsilizium übertragen. Der erste Schritt besteht aus einer anisotropen Ätzmethode auf Fluorbasis, die als Bosch-Verfahren bekannt ist und Silizium vertikal nach unten ätzt und so eine gerade Wand erzeugt.
HINWEIS: Das Bosch-Verfahren verwendetC4F8 und Schwefelhexafluorid (SF6) Gase in der Reaktionskammer: Die Abscheidung C4F8 erzeugt eine Passivierungsschicht, während das SF6 Silizium vertikal nach unten ätzt. So ermöglicht das Bosch-Verfahren die Mikrofertigung von tiefen Gräben in Silizium mit hohen Seitenverhältnissen. - Führen Sie diesen Prozess für fünf Zyklen aus, was einer Ätztiefe für Silizium entspricht, die einem Entspricht von 2 m entspricht. Prozessparameter sind in Tabelle 4aufgeführt.
- Reinigen Sie den Wafer in Piranha-Lösung für 10 min, um restliche Reste des Bosch-Prozesses zu entfernen. Spülen Sie den Wafer mit DI-Wasser und spintrocknen Sie in einer N2-Umgebung (Abbildung 3E).
- Nach dem Ätzen der Kieselsäureschicht den Wafer in ein tiefes ICP-RIE-System auf Ätzsilizium übertragen. Der erste Schritt besteht aus einer anisotropen Ätzmethode auf Fluorbasis, die als Bosch-Verfahren bekannt ist und Silizium vertikal nach unten ätzt und so eine gerade Wand erzeugt.
- Isotrope Siliziumätzung: Um das Reentrant-Feature zu erstellen, führen Sie isotrope Ätzungen durch, die einen Undercut unter der Kieselsäureschicht erzeugen würden. Durch Ätzen der Siliziumschicht mit SF6 für 2 min 45 s (Abbildung 3F) kann ein 5'm-Überhang erreicht werden. Siehe Tabelle 5 für die Prozessparameter.
-
Anisotrope Siliziumätzung: Sobald die Wiedereintrittsfunktionen erstellt sind, stimmen Sie die Tiefe der Hohlräume durch den Bosch-Prozess ab (Schritt 5.1).
ANMERKUNG: Um Hohlräume mit einer Tiefe von hc bei 50 m zu mikrofadieren, sind 160 Zyklen des Bosch-Prozesses erforderlich(Abbildung 3G, Tabelle 4). -
Waferreinigung und -lagerung
- Reinigen Sie den Wafer mit Piranha-Lösung, wie in Schritt 2 beschrieben. Nach diesem Schritt wird der Wafer superhydrophil, gekennzeichnet durch Kontaktwinkel des Wassers, o- 0°.
- Den Wafer in einer gläsernen Petrischale aufbewahren und in einen sauberen Vakuumofen mit T = 323 K und Vakuumdruck PVac = 3,3 kPa für 48 h legen, danach stabilisiert sich der intrinsische Kontaktwinkel der Kieselsäureschicht auf 40°.
- Bewahren Sie die Proben in einem sauberen Schrank auf, der mit einem nach außen gerichteten Stickstoff (99%) für weitere Charakterisierung bereit.
6. Doppelt reentrant Hohlräume
- Anisotrope Siliziumätzung: Um doppelt wiedereintretende Hohlräume zu erstellen, befolgen Sie die Schritte 1, 2, 3, 4 und 5.1 (siehe Abbildung 4A–E).
-
Isotrope Siliziumätzung
Um doppelt wiedereintretende Features zu erstellen, müssen zuerst wiedereintretende Features erstellt werden. Um dies zu erreichen, führen Sie isotrope Ätzen durch, um einen Undercut unter der Kieselsäureschicht zu erstellen. Ätzen Sie die Siliziumschicht mit SF6 für 25 s (Abbildung 4F). Siehe Tabelle 5 für die Prozessparameter. Anschließend reinigen Sie den Wafer mit Piranha-Lösung, wie in Schritt 2 beschrieben. -
Thermisches Oxidwachstum
- Um doppelt reentrante Eigenschaften zu erreichen, wachsen Sie eine 500 nm Schicht thermischen Oxids auf dem Wafer, mit einem Hochtemperatur-Ofensystem(Abbildung 4G).
- Messen Sie die Dicke der Oxidschicht mit einem Reflektometer.
HINWEIS: Die Oxidation erfolgte durch die Exposition der Proben gegenüber einer Umgebung, die Sauerstoff(O2) und Wasserdampf umfasst, was zu einer nassen Oxidation von Silizium in einer geschlossenen Umgebung bei Temperaturen von 800–1.200 °C führte.
- Kieselsäure-Radierung: Führen Sie den gleichen Prozess wie in Schritt 4 beschrieben, um Kieselsäure vertikal nach unten für 3 min zu ätzen. Als Folge der anisotropen Radierung wird das thermale Oxid (500 nm dicke Kieselsäureschicht) von der Kavität weggeätzt, aber es hinterlässt einen "Überhang" entlang der Seitenwände, der schließlich die doppelt reentrantkante Kante bilden würde (Abbildung 4H, Tabelle 3).
- Anisotrope Siliziumätzung: Wiederholen Sie fünf Zyklen des Bosch-Prozesses, um die Hohlräume um 2 m zu vertiefen (Abbildung 4I, Tabelle 5). Dieser Schritt ist notwendig, um das Silizium hinter dem doppelt wiedereintretenden Feature im nächsten Schritt zu entfernen. Reinigen Sie den Wafer mit Piranha-Lösung.
- Isotrope Siliziumätzung: Führen Sie die isotrope Ätzung von Silizium für 2 min und 30 s unter Verwendung der in Tabelle 4beschriebenen Prozessparameter durch. Dieser Schritt schafft einen leeren Raum (ca. 2 m) hinter dem thermisch gewachsenen Oxid an der Mund des Hohlraums, der zur doppelt wiedereintretenden Kante führt (Abbildung 4J).
- Anisotrope Siliziumätzung: Verwenden Sie das Bosch-Prozessrezept (Schritt 5.1) für 160 Zyklen, um die Tiefe der Hohlräume auf 50 m zu erhöhen (Abbildung 4K, Tabelle 5).
- Waferreinigung und -lagerung: Reinigen Sie den Wafer mit Piranha-Lösung und speichern Sie, wie in Schritt 5.4 oben beschrieben.
MIKROFABRICATION VON PILLARS
Das Designprotokoll zur Herstellung von wiedereintretenden und doppelt wiedereintretenden Säulen und "Hybriden" (bestehend aus doppelt wiedereintretenden Säulen, die von Wänden umgeben sind) besteht aus drei Schlüsselschritten: Wafervorbereitung, Kieselsäureradierung und spezifische Siliziumätzung. Abbildung 5A–C zeigt die obere Ansicht des Layoutentwurfs für wiedereintretende und doppelt wiedereintretende Säulen, während Abbildung 5D–F das Layout der Hybrid-Arrays darstellt. Wählen Sie die Dunkelfeldoption der UV-Belichtung aus, um den gesamten Wafer mit Ausnahme des Musters mit demselben Photoresist (AZ5214E) verfügbar zu machen(Abbildung 6A–C und Abbildung 7A–C). Neben diesen Besonderheiten sind die Verfahren zur Reinigung des Wafers (Schritt 2) und ätzender Kieselsäure (Schritt 4) identisch.
7. Wiedereintrittssäulen
- Anisotrope Siliziumätzung: Nach Photolithographie, UV-Belichtung, Entwicklung und Ätzkiesel mit den oben beschriebenen Besonderheiten für Säulen (Schritte 1–4) wird der Wafer auf ein tiefes ICP-RIE-System übertragen, um die Siliziumschicht mit dem Bosch-Verfahren zu ätzen. Dieser Schritt steuert die Höhe der Pfeiler. Verwenden Sie 160 Zyklen des Bosch-Prozesses, um Höhensäulen zu erzielen, hP bei 30 m (Abbildung 6E, Tabelle 5). Reinigen Sie den Wafer wie in Schritt 2 beschrieben.
- Isotrope Siliziumätzung: Führen Sie isotrope Ätzen mit SF6 für 5 min, um die wiedereintretende Kante auf den Säulen zu erstellen (Abbildung 6F, Tabelle 4). Die resultierende Länge des Überhangs beträgt 5 m.
- Piranha Reinigung und Lagerung: Reinigen Sie den Wafer mit Piranha-Lösung und speichern Sie, wie in Schritt 5.4 oben beschrieben.
8. Doppelt reentrant Säulen und Hybriden
- Anisotrope Siliziumätzung: Nach dem Ätzen von SiO2den Wafer in ein tiefes ICP-RIE-System übertragen, um den Si unter die SiO2-Schicht zu ätzen. Führen Sie fünf Zyklen des Bosch-Prozesses durch, die einer Ätztiefe von 2 m entsprechen (Abbildung 7E, Tabelle 4). Anschließend den Wafer wie in Schritt (2) beschrieben reinigen.
- Isotrope Siliziumätzung: Führen Sie isotrope Ätzen mit SF6 für 16 s, um die wiedereintretende Kante zu erstellen (Tabelle 5, Abbildung 7F). Reinigen Sie den Wafer wie in Schritt 2 beschrieben.
- Thermisches Oxidwachstum: 500 nm thermische Oxidschicht über den Wafer mit einem Hochtemperatur-Ofensystem wachsen, wie in Schritt 6.3 beschrieben (Abbildung 7G).
- Kieselsäure-Radierung: Ätzen Sie die thermisch angebaute Oxidschicht (500 nm dick) für 3 min, wie in Schritt 6.4 beschrieben (Abbildung 7H, Tabelle 3).
- Anisotrope Siliziumätzung: Wiederholen Sie 160 Zyklen des Bosch-Prozesses (Tabelle 4), um die Höhe der Pfeiler zu erhöhen (Abbildung 7I). Reinigen Sie den Wafer wie in Schritt 2 oben beschrieben.
- Isotrope Siliziumätzung: Führen Sie die isotrope Ätzung von Silizium für 5 min unter Verwendung der in Tabelle 4beschriebenen Prozessparameter durch. In diesem Schritt wird die doppelt wiedereintretende Kante erstellt (Abbildung 7J). Der Abstand zwischen Säulenstiel und doppelt wiedereintretender Kante beträgt 2 m.
- Waferreinigung und -lagerung: Reinigen Sie den Wafer mit Piranha-Lösung und speichern Sie, wie in Schritt 5.4 oben beschrieben.
Abbildung 8 stellt die Liste der Prozesse dar, die bei der Mikroherstellung von Wiedereintritts- und doppelt wiedereintretenden Hohlräumen und Säulen verwendet werden.
Ergebnisse
In diesem Abschnitt zeigen wir wiedereintretende und doppelt wiedereintretende Hohlräume (RCs und DRCs, Abbildung 9) und wiedereintretende und doppelt wiedereintretende Säulen (RPs und DRPs, Abbildung 10), die mit den oben beschriebenen Protokollen mikrofabriziert werden. Alle Hohlräume haben den Durchmesser, DC = 200 m, die Tiefe, hC 50 m und den Abstand von Mitte zu Mitte (oder die Steigung) zwischen benachbarten Hohlräumen, die LC = DC + 12 m betragen. Mit den gleichen Fertigungsprotokollen können auch Hohlräume von nicht kreisförmigen Formen hergestellt werden, wie zuvorberichtet 26.
Der Durchmesser der Kappe auf der Oberseite der Säulen war DP = 20 m, und ihre Höhe bzw. Steigung waren jeweils hp 30 m und LP = 100 m(Abbildung 10).
Benetzungsverhalten von Gas-Entrapping Microtexturen (GEMs)
Flache Kieselsäure (SiO2) ist intrinsisch benetzt in Richtung der meisten polaren und unpolaren Flüssigkeiten. So befanden sich z.B. die intrinsischen Kontaktwinkel der Tröpfchen von Hexadecan(LV = 20 mN/m bei 20 °C) und Wasser (Oberflächenspannungbei 20 °C) auf Kieselsäure bzw. bei 20 °C. Nach der Mikroherstellung von wiedereintretenden und doppelt wiedereintretenden Hohlräumen (DRCs) und Säulen änderten sich die Kontaktwinkel jedoch drastisch (Tabelle 6). Wir maßen die vorrückenden/zurückgehenden Kontaktwinkel, indem wir die Flüssigkeiten mit einer Rate von 0,2 l/s abgab und fanden die scheinbaren Kontaktwinkel für beide Flüssigkeiten,s r > 120°, (omniphob; Abbildung 11E). Zurücktretende Kontaktwinkel, r- 0° wegen der fehlenden Diskontinuität in den Mikrotexturen, wie z. B. in säulenbasierten Mikrotexturen. Auf der anderen Seite wiesen SiO2/Si-Oberflächen mit Arrays doppelt reentranter Säulen (DRPs) scheinbare Kontaktwinkel auf, fürbeide Flüssigkeiten zeigten r> 150° und die Kontaktwinkelhysterese war minimal (superomniphobe Abbildung 11A und Filme S1 und S2). Seltsamerweise, wenn die gleichen SiO2/Si-Oberflächen mit Arrays von Säulen in die gleichen Flüssigkeiten eingetaucht wurden, wurden sie sofort eingedrungen, t < 1 s, d.h. keine Luft war eingeschlossen (Abbildung 10A-D, Film S3). Während die Säulen in Bezug auf die Kontaktwinkel superomniphob schienen, gelang es ihnen nicht, Luft beim Eintauchen einzufangen. Tatsächlich dringen benetzende Flüssigkeiten aus der Grenze der Mikrotextur (oder aus lokalisierten Defekten) ein und verdrängen jede eingeschlossene Luft sofort(Abbildung 11A-D und Film S3). Im Gegensatz dazu umfliegt der DRCs Luft beim Eintauchen in beide Flüssigkeiten(Abbildung 11E-H und S1, Tabelle 1); für Hexadecan war die eingeschlossene Luft auch nach 1 Monat26intakt. Unsere konfokalen Mikroskopieexperimente haben gezeigt, dass die überhängenden Eigenschaften die eindringenden Flüssigkeiten stabilisieren und Luft einfangen (Abbildung 12A-B).
Als nächstes, um Luft in Arrays von DRPs einzufangen, verwendeten wir die gleichen Mikro-Fertigungsprotokolle, um Arrays von Säulen zu erreichen, die von Wänden mit doppelt neu eintretendem Profil umgeben sind (Abbildung 10G–I). Diese Strategie isolierte die Stängel der DRPs von benetzten Flüssigkeiten. Infolgedessen verhielten sich die hybriden Mikrotexturen wie GEMs, wie durch konfokale Mikroskopie bestätigt (Abbildung 12C-D) und Movie S4, Tabelle 6). So zeigten Kieselsäureoberflächen mit hybriden Mikrotexturen Omniphobizität beim Eintauchen durch Abfangen von Luft und zeigten Kontaktwinkel,s r > 120°, (omniphob), und erwiesen sich im wahrsten Sinne des Wortes als omniphob, d.h. in Bezug auf Kontaktwinkel und einleitende Luft beim Eintauchen. In Tabelle 6bewerten wir die Omniphobizität von SiO2/Si Oberflächen mit einer Vielzahl von Mikrotexturen hohl, säulenbasiert und Hybriden durch Kontaktwinkel und Eintauchen.
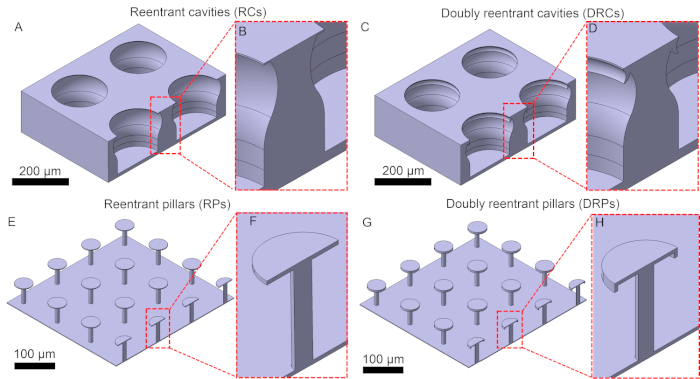
Abbildung 1: Schemata von Mikrostrukturen. (A–B) Reentrant Hohlräume, (C–D) doppelt wiedereintreten hohle, (E–F) wiedereintretende Säulen, (G–H) doppelt wiedereintretende Säulen. Bitte klicken Sie hier, um eine größere Version dieser Abbildung anzuzeigen.
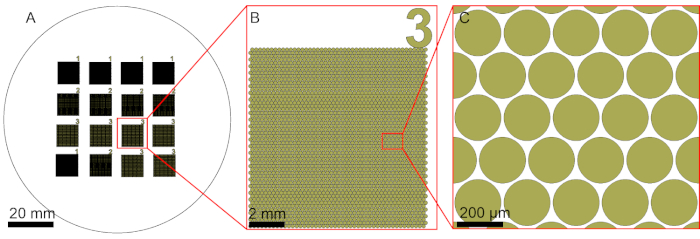
Abbildung 2: Konstruktionsmuster für Hohlräume. Designmuster für Reentrant- und Doppel-Reentranthohlräume, die mit der Layout-Software generiert werden. Das Muster wurde mittels Photolithographie auf den Wafer übertragen. Bitte klicken Sie hier, um eine größere Version dieser Abbildung anzuzeigen.

Abbildung 3: Mikrofabrikationsprotokoll für Wiedereintrittshohlräume. (A) Reinigen Sie Denkmittelwafer mit 2,4 m dickem Kieselsäure auf der Oberseite. (B) Den Wafer mit Photoresist beschichten und UV-Licht aussetzen. (C) Entwickeln Sie den UV-belichteten Photoresist, um das Designmuster zu erhalten. (D) Ätzen der exponierten oberen Kieselsäureschicht vertikal nach unten (anisotrope Ätzung) unter Verwendung induktiv gekoppelter Plasma (ICP) reaktiv-ionenätzender Ätzungen (RIE). (E) Flache anisotrope Ätzung der exponierten Siliziumschicht unter Verwendung von tiefem ICP-RIE. (F) Isotrope Ätzung von Silizium, um die wiedereintretende Kante zu erzeugen. (G) Tiefe anisotrope Siliziumätzung zur Erhöhung der Hohlraumtiefe. Bitte klicken Sie hier, um eine größere Version dieser Abbildung anzuzeigen.
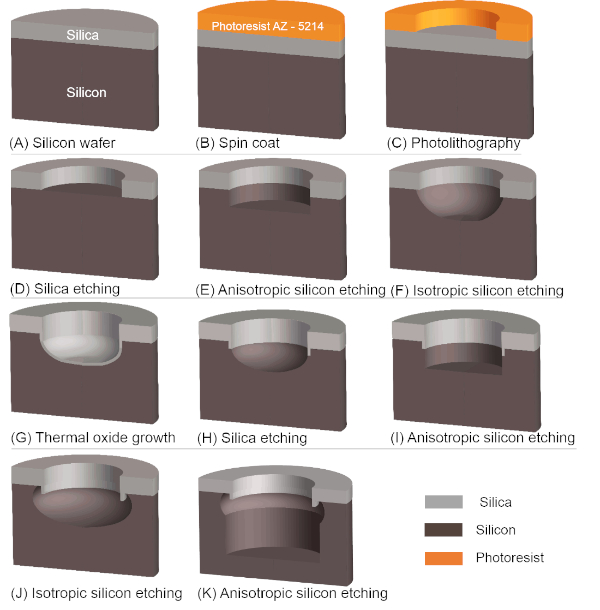
Abbildung 4: Mikrofabrikationsprotokoll für doppelt wiedereintretende Hohlräume. (A) Reinigen Sie Denkmittelwafer mit 2,4 m dickem Kieselsäure auf der Oberseite. (B) Den Wafer mit Photoresist beschichten und UV-Licht aussetzen. (C) Entwickeln Sie den UV-belichteten Photoresist, um das Designmuster zu erhalten. (D) Ätzen der exponierten oberen Kieselsäureschicht vertikal nach unten (anisotrope Ätzung) unter Verwendung induktiv gekoppelter Plasma (ICP) reaktiv-ionenätzender Ätzungen (RIE). (E) Flache anisotrope Ätzung der exponierten Siliziumschicht unter Verwendung von tiefem ICP-RIE. (F) Flache isotrope Ätzung von Silizium, um unter mit tiefen ICP-RIE zu erzeugen. (G) Thermisches Oxidwachstum. (H) Anisotrope Ätzung der oberen und unteren Kieselsäureschicht. (I) Flache anisotrope Ätzung von Silizium. (J) Isotroper Silizium-Etch, um die doppelt reentrantKante zu erzeugen. (K) Tiefe anisotrope Siliziumätzung zur Erhöhung der Hohlraumtiefe. Bitte klicken Sie hier, um eine größere Version dieser Abbildung anzuzeigen.

Abbildung 5: Entwurfsmuster für Säulen. Entwerfen Sie Muster für Reentrant, doppelt reentrant und Hybrid-Säulen, die mit der Layout-Software generiert werden. Das Muster wurde mittels Photolithographie auf den Wafer übertragen. Bitte klicken Sie hier, um eine größere Version dieser Abbildung anzuzeigen.
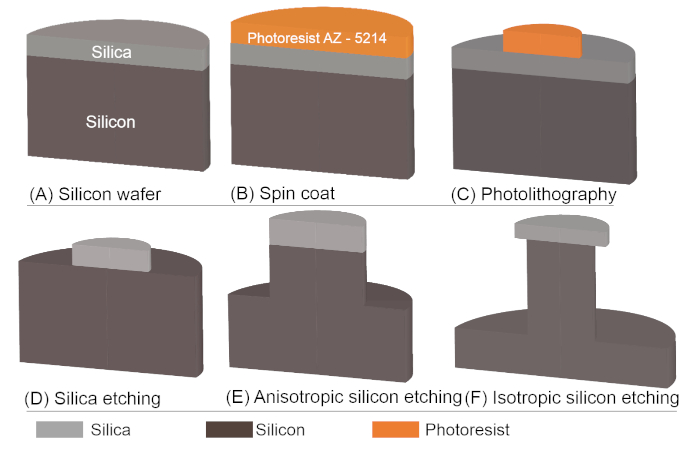
Abbildung 6: Mikrofabrikationsprotokoll von wiedereintretenden Säulen. (A) Reinigen Sie Denkmittelwafer mit 2,4 m dickem Kieselsäure auf der Oberseite. (B) Den Wafer mit Photoresist beschichten und UV-Licht aussetzen. (C) Entwickeln Sie den UV-belichteten Photoresist, um das Designmuster zu erhalten. (D) Ätzen der exponierten oberen Kieselsäureschicht vertikal nach unten (anisotrope Ätzung) unter Verwendung induktiv gekoppelter Plasma (ICP) reaktiv-ionenätzender Ätzungen (RIE). (E) Tiefe anisotrope Siliziumätzung, um die Höhe der Säulen zu erhöhen. (F) Isotrope Siliziumätzung, um die wiedereintretende Kante zu erzeugen. Bitte klicken Sie hier, um eine größere Version dieser Abbildung anzuzeigen.
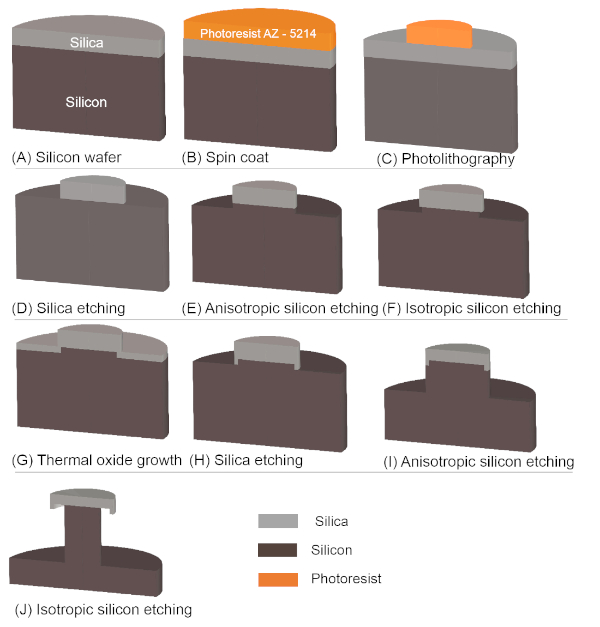
Abbildung 7: Mikrofertigungsprotokoll für doppelt wiedereintretende Säulen. (A) Reinigen Sie Denkmittelwafer mit 2,4 m dickem Kieselsäure auf der Oberseite. (B) Den Wafer mit Photoresist beschichten und UV-Licht aussetzen. (C) Entwickeln Sie den UV-belichteten Photoresist, um das Designmuster zu erhalten. (D) Ätzen der exponierten oberen Kieselsäureschicht vertikal nach unten (anisotrope Ätzung) unter Verwendung induktiv gekoppelter Plasma (ICP) reaktiv-ionenätzender Ätzungen (RIE). (E) Flache anisotrope Ätzung der exponierten Siliziumschicht unter Verwendung von tiefem ICP-RIE. (F) Flache isotrope Ätzung von Silizium, um unter mit tiefen ICP-RIE zu erzeugen. (G) Thermisches Oxidwachstum. (H) Anisotrope Ätzung der Ober- und Unterseite der Kieselsäureschicht. (I) Anisotrope Siliziumätzung zur Erhöhung der Höhe der Säulen. (J) Isotrope Siliziumätzung, um die doppelt wiedereintretende Kante zu erzeugen. Beachten Sie, dass der einzige Unterschied zwischen doppelt wiedereintretenden Säulen und dem "Hybrid" das Design am Anfang ist. Bitte klicken Sie hier, um eine größere Version dieser Abbildung anzuzeigen.

Abbildung 8: Mikrofabrikationsprotokoll für wiedereintretende und doppelt wiedereintretende Hohlräume und Säulen. Das Flussdiagramm listet die wichtigsten Schritte auf. Bitte klicken Sie hier, um eine größere Version dieser Abbildung anzuzeigen.
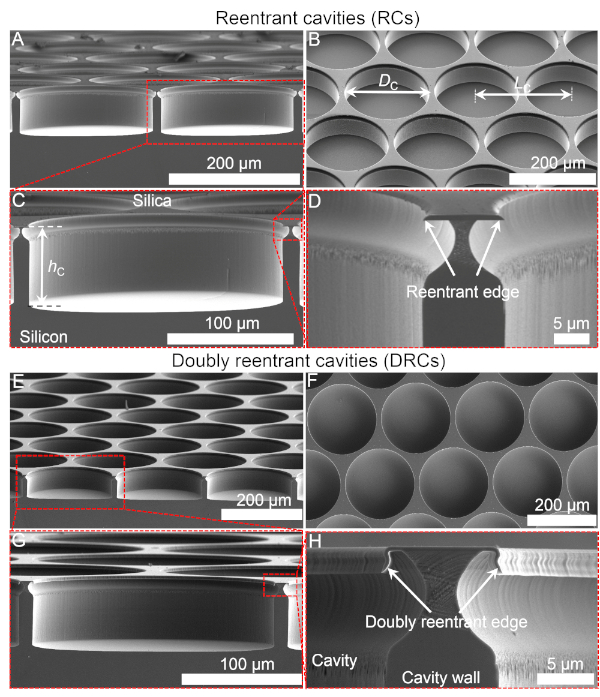
Abbildung 9: Rasterelektronenmikroskopie von reentranten und doppelt wiedereintretenden Hohlräumen. (A–D) Querschnitts- und isometrische Ansichten von Kieselsäureoberflächen mit einer Reihe von Wiedereintrittshohlräumen. (E-H) Querschnitts- und Topansichten von doppelt neu eintretenden Hohlräumen. DC = Durchmesser des Hohlraums und LC = der Abstand zwischen Mitte-Mitte zwischen benachbarten Hohlräumen (oder Steigung) und hC = Tiefe des Hohlraums. Bitte klicken Sie hier, um eine größere Version dieser Abbildung anzuzeigen.
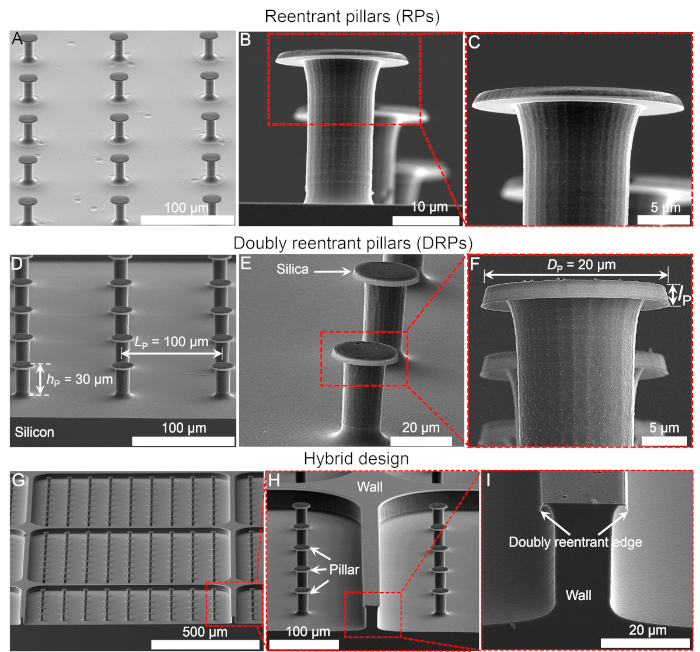
Abbildung 10: Rasterelektronenmikroskopie von wiedereintretenden und doppelt wiedereintretenden Säulen. (A–C) Isometrische Ansicht von wiedereintretenden Säulen. (D–F) Doppelt wiedereintretende Säulen. (G–I) Hybride Säulen - DRPs umgeben von doppelt wiedereintretenden Wänden. DP - Durchmesser der Säulenkappe und LP - der Abstand von Mitte zu Mitte zwischen benachbarten Säulen (oder Steigung) und hP – Höhe der Säulen. Abbildung D–I, nachgedruckt aus Ref.35, Copyright (2019), mit Genehmigung von Elsevier. Bitte klicken Sie hier, um eine größere Version dieser Abbildung anzuzeigen.

Abbildung 11: Wettverhalten. (A) Superomniphobizität von SiO2/Si Oberflächen mit Arrays doppelt reentrant Säulen geschmückt, beobachtet durch Platzierung von flüssigkeitstropfen auf der Oberseite. (B-D) Die Superomniphobizität geht sofort verloren, wenn benetzende Flüssigkeiten die Grenze oder lokalisierte Defekte berühren. (E) SiO2/Si-Oberflächen, die mit Arrays verziert sind, weisen doppelt wiederauffindende Hohlräume auf. (F-H) Diese Mikrotexturen fangen die Luft robust ein und verlieren sie nicht, wenn Flüssigkeit die Grenze oder lokalisierte Defekte berührt. Nachdruck ab Ref.35, Copyright (2019), mit Genehmigung von Elsevier. Bitte klicken Sie hier, um eine größere Version dieser Abbildung anzuzeigen.

Abbildung 12: Konfokale Mikroskopie von Mikrotexturen, die in Flüssigkeiten eingetaucht sind. Computerverstärkte 3D-Rekonstruktionen repräsentativer konfokaler Bilder (isometrische und Querschnitte entlang der gepunkteten Linien) von Benetzungsübergängen in Kieselsäureoberflächen mit doppelt reentranten Hohlräumen und Hybridsäulen, die nach 5 min Eintauchen von (A,C) Wasser und (B,D) Hexadecan unter eine z-5-mm-Säule getaucht werden. Die (falschen) blauen und gelben Farben entsprechen den Schnittstellen von Wasser und Hexadecan mit der eingeschlossenen Luft. Eindringende flüssige Meniszien wurden an doppelter Reentrantkante stabilisiert. (Skala bar = Durchmesser der Kavität und Säule 200 ' m bzw. 20 'm). Abbildung 12 wurde mit Genehmigung von Elsevier aus Ref.35, Copyright (2019) nachgedruckt. Bitte klicken Sie hier, um eine größere Version dieser Abbildung anzuzeigen.
| Stufe 1: Austrocknung und Spülsauerstoff aus der Kammer | ||
| Schritt | Prozessablauf | Zeit (min) |
| 1 | Vakuum (10 Torr) | 1 |
| 2 | Stickstoff (760 Torr) | 3 |
| 3 | Vakuum (10 Torr) | 1 |
| 4 | Stickstoff (760 Torr) | 3 |
| 5 | Vakuum (10 Torr) | 1 |
| 6 | Stickstoff (760 Torr) | 3 |
| Stufe 2: Priming | ||
| Prozessablauf | Zeit (min) | |
| 7 | Vakuum (1 Torr) | 2 |
| 8 | HMDS (6 Torr) | 5 |
| Stufe 3: Reinigen von Prime-Auspuff | ||
| Prozessablauf | Zeit (min) | |
| 9 | Vakuum | 1 |
| 10 | Stickstoff | 2 |
| 11 | Vakuum | 2 |
| Stufe 4: Rückkehr zur Atmosphäre (Backfill) | ||
| Prozessablauf | Zeit (min) | |
| 12 | Stickstoff | 3 |
Tabelle 1: Verfahrensdetails zur Beschichtung von Hexamethyldisilazan (HMDS)-Schichten zur Verbesserung der Haftung zwischen der Kieselsäureoberfläche und dem AZ-5214E-Photoresist.
| Schritt | Geschwindigkeit (rpm) | Rampe (rpm/s) | Zeit (s) |
| 1 | 800 | 1000 | 3 |
| 2 | 1500 | 1500 | 3 |
| 3 | 3000 | 3000 | 30 |
Tabelle 2: Prozessdetails zur Erreichung einer 1,6 m dicken AZ-5214E Photoresist-Schicht auf SiO2/Si-Wafern durch Spin-Beschichtung.
| HF-Leistung, (W) | ICP-Leistung, (W) | Ätzdruck, (mTorr) | C4F8 Durchfluss (sccm) | O2 Durchfluss (sccm) | Temperatur, (°C) |
| 100 | 1500 | 10 | 40 | 5 | 10 |
Tabelle 3: Parametereinstellungen für Kieselsäureätzungen, die in induktiv gekoppeltem Plasma – Reaktive Ionenätzung (ICP-RIE) verwendet werden.
| HF-Leistung, (W) | ICP-Leistung, (W) | Ätzdruck, (mTorr) | SF6 Durchfluss, (sccm) | Temperatur, (°C) |
| 20 | 1800 | 35 | 110 | 15 |
Tabelle 4: Parametereinstellungen für Siliziumätzung (isotrop), die in induktiv gekoppeltem Plasma verwendet wird – tiefreaktive Ionenätzung (ICP-DRIE).
| Schritt | HF-Leistung, (W) | ICP-Leistung, (W) | Ätzdruck, (mTorr) | SF6 Durchfluss, (sccm) | C4F8 Durchfluss, (sccm) | Temperatur, (°C) | Abscheidungs-/Ätzzeit, (s) |
| Passivierungsschicht | 5 | 1300 | 30 | 5 | 100 | 15 | 5 |
| Radierung | 30 | 1300 | 30 | 100 | 5 | 15 | 7 |
Tabelle 5: Parametereinstellungen für Siliziumätzung (anisotrop), die in induktiv gekoppeltem Plasma verwendet wird – tiefreaktive Ionenätzung (ICP-DRIE).
| Oberflächen | Kriterium: Kontaktwinkel in der Luft | Kriterium: Eintauchen | |||
| Wasser | Hexadecan | Wasser | Hexadecan | ||
| DRPs | r | 153°-1° | 153° bei 1° | Sofortige Penetration | Sofortige Penetration |
| A | 161°-2° | 159° bei 1° | |||
| •R | 139°-1° | 132° bei 1° | |||
| Bewertung: | Superomniphobe | Nicht omniphob – in der Tat, omniphil | |||
| Drcs | r | 124° bei 2° | 115° bis 3° | Gefangene Luft (omniphob) | Gefangene Luft (omniphob) |
| A | 139° bis 3° | 134° bis 5° | |||
| •R | 0° | 0° | |||
| Bewertung: | Omniphob | Omniphob | |||
| Hybriden | r | 153°x 2° | 153° bei 2° | Gefangene Luft (omniphob) | Gefangene Luft (omniphob) |
| A | 161°-2° | 159° bei 2° | |||
| •R | 0° | 0° | |||
| Bewertung: | Omniphob | Omniphob | |||
Tabelle 6:Kontaktwinkelmessungen – Vorrücken (A), Zurücktreten (R) und scheinbares (r) – und Eintauchen in Flüssigkeiten. Diese Tabelle wurde von Ref.35, Copyright (2019), mit Genehmigung von Elsevier nachgedruckt.
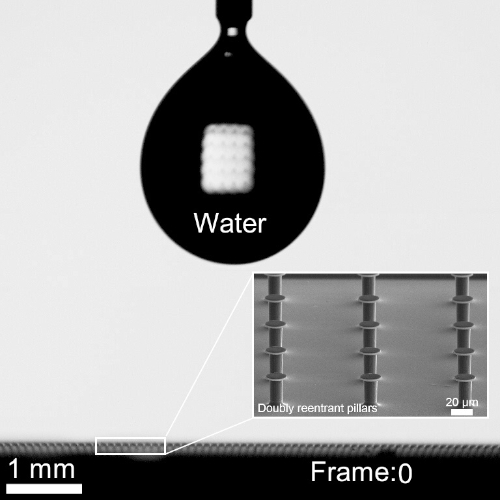
Film S1: Hochgeschwindigkeits-Bildsequenz (15K fps) von Wassertropfen, die von mikrotexturierten Oberflächen springen, die aus doppelt wiedereintretenden Säulen bestehen. Dieser Film wurde ab Ref. 35 nachgedruckt. Copyright (2019), mit Genehmigung von Elsevier. Bitte klicken Sie hier, um dieses Video anzusehen (Rechtsklick zum Download).
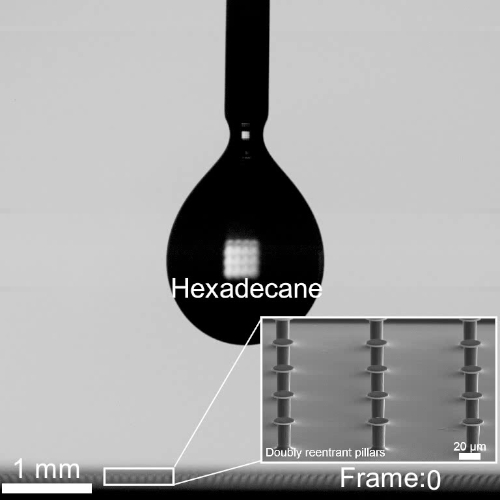
Film S2: Hochgeschwindigkeits-Bildsequenz (19K fps) von Hexadecan-Tröpfchen, das von mikrotexturierten Oberflächen springt, die aus doppelt wiedereintretenden Säulen bestehen. Dieser Film wurde ab Ref. 35 nachgedruckt. Copyright (2019), mit Genehmigung von Elsevier. Bitte klicken Sie hier, um dieses Video anzusehen (Rechtsklick zum Download).
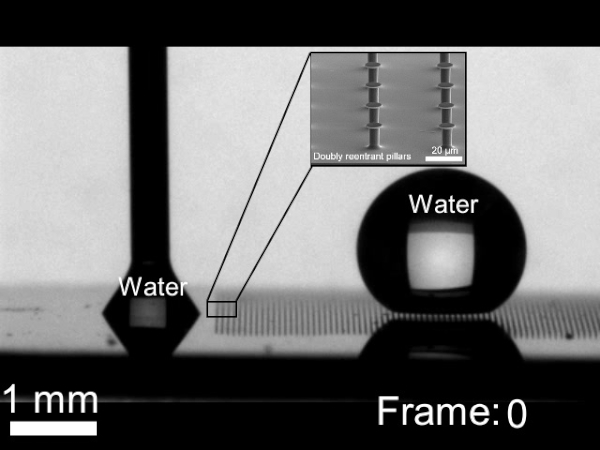
Film S3: Bildsequenz (200 fps) der Wasserimbibition in Mikrotextur, bestehend aus doppelt wiedereintretenden Säulen. Dieser Film wurde ab Ref. 35 nachgedruckt. Copyright (2019), mit Genehmigung von Elsevier. Bitte klicken Sie hier, um dieses Video anzusehen (Rechtsklick zum Download).
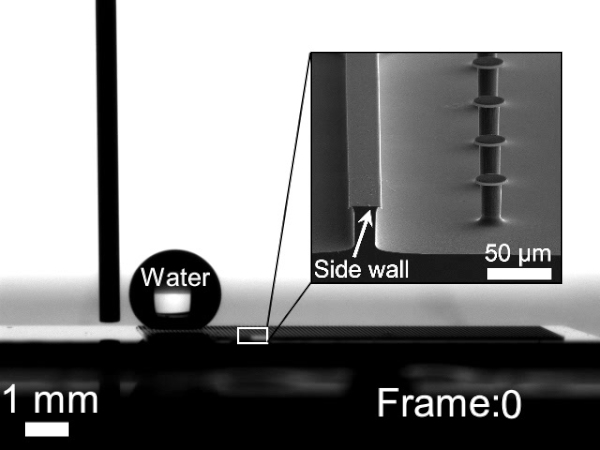
Film S4: Bildsequenz (200 fps) Wassertropfen, der neben hybrider Mikrotextur vorrückt. Das Vorhandensein einer doppelt wiedereintretenden Grenzwand verhindert eine Flüssigkeitsinvasion in die Mikrotextur, was die Oberfläche auch unter Untertauchen omniphob macht. Dieser Film wurde ab Ref. 35 nachgedruckt. Copyright (2019), mit Genehmigung von Elsevier. Bitte klicken Sie hier, um dieses Video anzusehen (Rechtsklick zum Download).
Diskussion
Hier werden zusätzliche Faktoren und Entwurfskriterien erläutert, die dem Leser bei der Anwendung dieser Mikrofertigungsprotokolle helfen. Für Hohlraum-Mikrotexturen (RCs und DRCs) ist die Wahl der Tonhöhe entscheidend. Dünnere Wände zwischen benachbarten Hohlräumen würden zu einem niedrigen flüssigkeitsfesten Grenzflächenbereich und einem hohen Flüssigkeitsdampf-Grenzflächenbereich führen, was zu hohen scheinbaren Kontaktwinkeln34führen würde. Dünne Wände könnten jedoch die mechanische Integrität der Mikrotextur beeinträchtigen, z. B. bei der Handhabung und Charakterisierung; ein wenig Überätzung mit dünnen Wänden (z.B. in Schritt 6.6) könnte die gesamte Mikrotextur zerstören; Unterätzung mit dünnen Wänden könnte auch die Entwicklung von doppelt reentranten Merkmalen verhindern. Wenn die DRK-Merkmale nicht vollständig entwickelt sind, könnte ihre Fähigkeit, Luft langfristig einzufangen, leiden, insbesondere wenn die Flüssigkeit in den Hohlräumen kondensiert26. Aus diesem Grund haben wir in unseren Experimenten die Tonhöhe als L = D + 12 m gewählt (d.h. die minimale Wanddicke zwischen den Hohlräumen betrug 12 m). Wir fertigen auch doppelt wiedereinthohlende Hohlräume mit einer kleineren Steigung von L = D + 5 m, aber die resultierenden Oberflächen waren aufgrund von strukturellen Schäden während der Mikrofertigung nicht homogen.
Während der Ätzung der Kieselsäureschicht mit C4F8 und O2 in Schritt 4 kann die Vorgeschichte der Verwendung oder die Sauberkeit der Reaktionskammer variable Ergebnisse liefern, obwohl sie die gleichen Schritte befolgen, z. B. in einer gemeinsamen Benutzereinrichtung wie an den meisten Universitäten. Daher wird empfohlen, dass dieser Schritt in kurzen Zeiträumen durchgeführt wird, zum Beispiel nicht mehr als 5 min jeder und überwacht die Dicke der Kieselsäureschicht durch eine unabhängige Technik, wie Reflektometrie. Für unsere Wafer mit einer 2,4 m dicken Kieselsäureschicht benötigte eine typische Ätzroutine 13 min, um Kieselsäure vollständig aus den Zielbereichen zu entfernen (Tabelle 3). Da der Photoresist auch während des Prozesses geätzt wurde, entfernte dieser Schritt 1 m der Kieselsäureschicht, die zunächst durch den Photoresist maskiert wurde. Um zu gewährleisten, dass die Ätzrate wie erwartet war, und um kreuzkontaminationen durch frühere Ätzverfahren zu vermeiden (ein häufiges Problem in Mehrbenutzeranlagen), ging der Kieselsäureätzung immer vorsorglich das Ätzen eines Opferwafers voraus. Während der Entwicklung des Photoresists kann die exponierte Oberfläche mit den Spuren/Partikeln des Photoresists kontaminiert werden, die als (mikroskopische) Masken fungieren können, die zur Bildung von Stiftrückständen führen. Um dies zu vermeiden, sollten strenge Reinigungs- und Lagerprotokolle während des gesamten Mikroherstellungsprozesses36befolgt werden.
Auch wenn die SiO2-Schicht während des Bosch-Prozesses als Maske für die darunter liegende Si-Schicht fungiert, wird sie während langer Ätzzyklen, wenn auch langsamer, geätzt. Somit ist die Tiefe der Hohlräume oder die Höhe der Säulen bis zu dem Punkt begrenzt, dass die wiedereintretenden Merkmale nicht beeinträchtigt werden. Die Passivierungs- und Ätzzeiten während des Bosch-Prozesses sollten auf glatte Wände abgestimmt werden. Dies kann erreicht werden, indem Rezepte iterativ getestet und deren Auswirkungen auf Proben beobachtet werden, z.B. mittels Elektronenmikroskopie.
Bei RPs und DRPs gilt: Je länger die isotrope Ätzung dauert, desto kleiner ist der Durchmesser des Stammes. Wenn der Durchmesser weniger als 10 m beträgt, kann dies zu einer mechanischen Fragilität führen. Diese Beschränkung sollte das Design zu Beginn des Mikroherstellungsverfahrens informieren.
Trockenätzwerkzeuge, die an Universitäten üblich sind, haben keine industrietauglichen Toleranzen, was zu räumlichen Ungleichmäßigkeiten in Bezug auf die Ätzrate innerhalb der Kammer führt. Daher sind die Features, die in der Mitte des Wafers erhalten werden, möglicherweise nicht mit denen an der Grenze identisch. Um diese Einschränkung zu überwinden, haben wir Vier-Zoll-Wafer verwendet und uns nur in der zentralen Region konzentriert.
Wir empfehlen auch die Verwendung von Direktschreibsystemen anstelle von Hartkontaktmasken für die Photolithographie, die schnelle Änderungen der Designparameter ermöglichen, einschließlich Funktionsdurchmessern, Tonhöhen und Formen (kreisförmig, sechseckig und quadratisch) usw.
Offensichtlich sind weder SiO2/Si Wafer noch Photolithographie die gewünschten Materialien oder Verfahren für die Massenproduktion von omniphoben Oberflächen. Sie dienen jedoch als hervorragendes Modellsystem zur Erforschung innovativer Mikrotexturen für die Entwicklung omniphober Oberflächen, z.B. durch Biomimetik26,27,34,35,46,47, die in kostengünstige und skalierbare Materialsysteme für Anwendungen übersetzt werden können. Es wird erwartet, dass in naher Zukunft die Konstruktionsprinzipien für GEMs unter anderem mit Techniken wie 3D-Druck48, additive Fertigung49und Laser-Mikrobearbeitung50skaliert werden könnten. Mikrotexturierte SiO2/Si Oberflächen könnten auch zur Verarbeitung weicher Materialien29,51verwendet werden. Derzeit untersuchen wir Anwendungen unserer gaseinschlüsseden Oberflächen zur Milderung von Kavitationsschäden47, Entsalzung46,52, und Verringerung des hydrodynamischen Luftwiderstands.
Offenlegungen
Die Autoren erklären, dass sie keine konkurrierenden Interessen haben.
Danksagungen
HM erkennt die Finanzierung durch die King Abdullah University of Science and Technology (KAUST) an.
Materialien
| Name | Company | Catalog Number | Comments |
| AZ-5214 E photoresist | Merck | DEAA070796-0W59 | Photoresist, flammable liquid |
| AZ-726 MIF developer | Merck | 10055824960 | To develop photoresist |
| Confocal microscopy | Zeiss | Zeiss LSM710 | Upright confocal microscope to visualize liquid meniscus shape |
| Deep ICP-RIE | Oxford Instruments | Plasmalab system100 | Silicon etching tool |
| Direct writer | Heidelberg Instruments | µPG501 | Direct-writing system |
| Drop shape analyzer | KRUSS | DSA100 | To measure contact angle |
| Hexadecane | Alfa Aesar | 544-76-3 | Test liquid |
| Highspeed imaging camera | Phantom vision research | v1212 | To image droplet bouncing |
| HMDS vapor prime | Yield Engineering systems | ||
| Hot plate | Cost effective equipments | Model 1300 | |
| Hydrogen peroxide 30% | Sigma Aldrich | 7722-84-1 | To prepare piranha solution |
| Imaris software | Bitplane | Version 8 | Post process confocal microscopy images |
| Nile Red | Sigma Aldrich | 7385-67-3 | Fluorescent dye for hexadecane |
| Nitrogen gas | KAUST lab supply | To dry the wafer | |
| Petri dish | VWR | HECH41042036 | |
| Reactive-Ion Etching (RIE) | Oxford Instruments | Plasmalab system100 | Silica etching tool |
| Reflectometer | Nanometrics | Nanospec 6100 | To check remaining oxide layer thickness |
| Rhodamine B (Acros) | Fisher scientific | 81-88-9 | Fluorescent dye for water |
| SEM stub | Electron Microscopy Sciences | 75923-19 | |
| SEM-Quanta 3D | FEI | Quanta 3D FEG Dual Beam | |
| Silicon wafer | Silicon Valley Microelectronics | Single side polished, 4" diameter, 500 µm thickness, 2.4 µm thick oxide layer | |
| Spin coater | Headway Research,Inc | PWM32 | |
| Spin rinse dryer | MicroProcess technology | Avenger Ultra -Pure 6 | Dry the wafers after piranha clean |
| Sulfuric acid 96% | Technic | 764-93-9 | To prepare piranha solution |
| Tanner EDA L-Edit software | Tanner EDA, Inc. | version15 | Layout design |
| Thermal oxide growth | Tystar furnace | To grow thermal oxide in patterned silicon wafer | |
| Tweezers | Excelta | 490-SA-PI | Wafer tweezer |
| Vacuum oven | Thermo Scientific | 13-258-13 | |
| Water | Milli-Q | Advantage A10 | Test liquid |
Referenzen
- Butt, H. J., et al. Characterization of super liquid-repellent surfaces. Current Opinion in Colloid & Interface Science. 19 (4), 343-345 (2014).
- Lee, J., Laoui, T., Karnik, R. Nanofluidic transport governed by the liquid/vapour interface. Nature Nanotechnology. 9 (4), 317-323 (2014).
- Subramanian, N., et al. Evaluating the potential of superhydrophobic nanoporous alumina membranes for direct contact membrane distillation. Journal of Colloid and Interface Science. 533, 723-732 (2019).
- Xue, Z. X., Cao, Y. Z., Liu, N., Feng, L., Jiang, L. Special wettable materials for oil/water separation. Journal of Materials Chemistry A. 2 (8), 2445-2460 (2014).
- Zhang, L. B., Zhong, Y. J., Cha, D., Wang, P. A self-cleaning underwater superoleophobic mesh for oil-water separation. Scientific Reports. 3, (2013).
- Leslie, D. C., et al. A bioinspired omniphobic surface coating on medical devices prevents thrombosis and biofouling. Nature Biotechnology. 32 (11), 1134-1140 (2014).
- Lee, C., Choi, C. H., Kim, C. J. Superhydrophobic drag reduction in laminar flows: a critical review. Experiments in Fluids. 57 (176), (2016).
- Tuteja, A., Choi, W., Mabry, J. M., McKinley, G. H., Cohen, R. E. Robust omniphobic surfaces. Proceedings of the National Academy of Sciences of the United States of America. 105 (47), 18200-18205 (2008).
- Brown, P. S., Bhushan, B. Mechanically durable, superoleophobic coatings prepared by layer-by-layer technique for anti-smudge and oil-water separation. Scientific Reports. 5, (2015).
- Wong, T. S., et al. Bioinspired self-repairing slippery surfaces with pressure-stable omniphobicity. Nature. 477 (7365), 443-447 (2011).
- Milionis, A., Dang, K., Prato, M., Loth, E., Bayer, I. Liquid repellent nanocomposites obtained from one-step water-based spray. Journal of Materials Chemistry A. 3 (24), 12880-12889 (2015).
- Mishra, H., et al. Time-Dependent Wetting Behavior of PDMS Surfaces with Bioinspired, Hierarchical Structures. ACS Applied Materials & Interfaces. 8 (12), 8168-8174 (2016).
- Hendren, Z. D., Brant, J., Wiesner, M. R. Surface modification of nanostructured ceramic membranes for direct contact membrane distillation. Journal of Membrane Science. 331 (12), 1-10 (2009).
- Rezaei, M., et al. Wetting phenomena in membrane distillation: Mechanisms, reversal, and prevention. Water Research. 139, 329-352 (2018).
- Verho, T., et al. Mechanically Durable Superhydrophobic Surfaces. Advanced Materials. 23, 673-678 (2011).
- Boinovich, L., Emelyanenko, A. M., Pashinin, A. S. Analysis of Long-Term Durability of Superhydrophobic Properties under Continuous Contact with Water. ACS Applied Materials & Interfaces. 2 (6), 1754-1758 (2010).
- Herminghaus, S. Roughness-induced non-wetting. Europhysics Letters. 52 (2), 165-170 (2000).
- Abdelsalam, M. E., Bartlett, P. N., Kelf, T., Baumberg, J. Wetting of regularly structured gold surfaces. Langmuir. 21 (5), 1753-1757 (2005).
- Liu, J. L., Feng, X. Q., Wang, G. F., Yu, S. W. Mechanisms of superhydrophobicity on hydrophilic substrates. Journal of Physics-Condensed Matter. 19 (35), (2007).
- Nosonovsky, M. Multiscale roughness and stability of superhydrophobic biomimetic interfaces. Langmuir. 23 (6), 3157-3161 (2007).
- Marmur, A. From hygrophilic to superhygrophobic: Theoretical conditions for making high-contact-angle surfaces from low-contact-angle materials. Langmuir. 24 (14), 7573-7579 (2008).
- Hensel, R., et al. Wetting Resistance at Its Topographical Limit: The Benefit of Mushroom and Serif T Structures. Langmuir. 29 (4), 1100-1112 (2013).
- Bormashenko, E. Progress in understanding wetting transitions on rough surfaces. Advances in Colloid and Interface Science. 222, 92-103 (2015).
- Patankar, N. A. Thermodynamics of trapping gases for underwater superhydrophobicity. Langmuir. 32 (27), 7023-7028 (2016).
- Kaufman, Y., et al. Simple-to-Apply Wetting Model to Predict Thermodynamically Stable and Metastable Contact Angles on Textured/Rough/Patterned Surfaces. The Journal of Physical Chemistry C. 121 (10), 5642-5656 (2017).
- Domingues, E. M., Arunachalam, S., Nauruzbayeva, J., Mishra, H. Biomimetic coating-free surfaces for long-term entrapment of air under wetting liquids. Nature Communications. 9 (1), 3606 (2018).
- Liu, T. Y., Kim, C. J. Turning a surface superrepellent even to completely wetting liquids. Science. 346 (6213), 1096-1100 (2014).
- Hensel, R., Neinhuis, C., Werner, C. The springtail cuticle as a blueprint for omniphobic surfaces. Chemical Society Reviews. 45 (2), 323-341 (2016).
- Hensel, R., et al. Biologically Inspired Omniphobic Surfaces by Reverse Imprint Lithography. Advanced Materials. 26 (13), 2029-2033 (2014).
- Hensel, R., et al. Tunable nano-replication to explore the omniphobic characteristics of springtail skin. Npg Asia Materials. 5, (2013).
- Helbig, R., Nickerl, J., Neinhuis, C., Werner, C. Smart Skin Patterns Protect Springtails. PLOS ONE. 6 (9), 25105 (2011).
- Cheng, L. Marine and Freshwater Skaters: Differences in Surface Fine Structures. Nature. 242, 132 (1973).
- Andersen, N. M., Cheng, L. The marine insect Halobates (Heteroptera: Gerridae): biology, adaptations, distribution, and phylogeny. Oceanography and marine biology: an annual review. 42, 119-180 (2004).
- Domingues, E. M., Arunachalam, S., Mishra, H. Doubly Reentrant Cavities Prevent Catastrophic Wetting Transitions on Intrinsically Wetting Surfaces. ACS Applied Materials & Interfaces. 9 (25), 21532-21538 (2017).
- Arunachalam, S., Das, R., Nauruzbayeva, J., Domingues, E. M., Mishra, H. Assessing omniphobicity by immersion. Journal of Colloid and Interface Science. 534, 156-162 (2019).
- Christian Koch, E. A. . Photolithography: Basics of Microstructuring. , (2017).
- Jansen, H., de Boer, M., Legtenberg, R., Elwenspoek, M. The black silicon method: a universal method for determining the parameter setting of a fluorine-based reactive ion etcher in deep silicon trench etching with profile control. Journal of Micromechanics and Microengineering. 5 (2), 115 (1995).
- Jansen, H. V., de Boer, M. J., Unnikrishnan, S., Louwerse, M., Elwenspoek, M. C. Black silicon method X: a review on high speed and selective plasma etching of silicon with profile control: an in-depth comparison between Bosch and cryostat DRIE processes as a roadmap to next generation equipment. Journal of Micromechanics and Microengineering. 19 (3), 033001 (2009).
- Xiu, Y., Zhu, L., Hess, D. W., Wong, C. Hierarchical silicon etched structures for controlled hydrophobicity/superhydrophobicity. Nano Letters. 7 (11), 3388-3393 (2007).
- Azeredo, B., et al. Silicon nanowires with controlled sidewall profile and roughness fabricated by thin-film dewetting and metal-assisted chemical etching. Nanotechnology. 24 (22), 225305 (2013).
- Coffinier, Y., et al. Preparation of superhydrophobic silicon oxide nanowire surfaces. Langmuir. 23 (4), 1608-1611 (2007).
- . L-Edit-The layout editor. Reference Manual Available from: https://usermanual.wiki/Document/LEdit20Manual.38314693/view (2009)
- . NANOSPEC 6100 Series Operators Users Manual Available from: https://cmi.epfl.ch/metrology/Nanospec_AFT6100_Manual.pdf (2019)
- Deal, B. E., Grove, A. General relationship for the thermal oxidation of silicon. Journal of Applied Physics. 36 (12), 3770-3778 (1965).
- Woollam, J. A., et al. Spectroscopic ellipsometry from the vacuum ultraviolet to the far infrared. AIP Conference Proceedings. 550 (1), 511-518 (2001).
- Das, R., Arunachalam, S., Ahmad, Z., Manalastas, E., Mishra, H. Bio-inspired gas-entrapping membranes (GEMs) derived from common water-wet materials for green desalination. Journal of Membrane Science. , 117185 (2019).
- Gonzalez-Avila, S. R., Nguyen, D. M., Arunachalam, S., Domingues, E. M., Mishra, H., Ohl, C. D. Mitigating cavitation erosion using biomimetic gas-entrapping microtextured surfaces. Science Advances. , (2020).
- Liu, X., et al. 3D Printing of Bioinspired Liquid Superrepellent Structures. Advanced Materials. 30 (22), 1800103 (2019).
- Jafari, R., Cloutier, C., Allahdini, A., Momen, G. Recent progress and challenges with 3D printing of patterned hydrophobic and superhydrophobic surfaces. The International Journal of Advanced Manufacturing Technology. , 1-14 (2019).
- Vorobyev, A. Y., Guo, C. L. Multifunctional surfaces produced by femtosecond laser pulses. Journal of Applied Physics. 117 (3), 033103 (2015).
- Xu, M., Kim, C. J. Method for manufacturing re-entrant microstructures. US Patent App. , (2018).
- Das, R., Arunachalam, S., Ahmad, Z., Manalastas, E., Syed, A., Buttner, U., Mishra, H. Proof-of-Concept for Gas-Entrapping Membranes Derived from Water-Loving SiO2/Si/SiO2 Wafers for Greener Desalination. Journal of Visualized Experiments. , e60583 (2020).
Nachdrucke und Genehmigungen
Genehmigung beantragen, um den Text oder die Abbildungen dieses JoVE-Artikels zu verwenden
Genehmigung beantragenThis article has been published
Video Coming Soon
Copyright © 2025 MyJoVE Corporation. Alle Rechte vorbehalten