Method Article
עיבוד SiO2/סי משטחים אומניפובי על ידי גילוף מיקרוטקסטורות גז-מיקרו הכוללת חללים מחדש ושני עמודים
In This Article
Summary
עבודה זו מציגה פרוטוקולים microfabrication להשגת חללים ועמודים עם מחדש ופרופילים מחדש כפליים על SiO2/Si וופלים באמצעות פוטוגרפיה ותחריט יבש. משטחי מיקרו בעלי מרקם כתוצאה מראים דוחה נוזלי מדהים, מאופיין מלכודת חזקה לטווח ארוך של אוויר תחת נוזלי הרטבה, למרות wettability פנימית של סיליקה.
Abstract
אנו מציגים פרוטוקולים מיקרוייצור לעיבוד חומרים הרטבה מיסודה דוחה לנוזלים (אומניפובי) על ידי יצירת גז מיקרוטקסטורות מיקרו (אבני חן) על אותם כולל חללים ועמודים עם תכונות מחדש וכפול. באופן ספציפי, אנו משתמשים ב-SiO2/Si כמערכת המודל והפרוטוקולים לשתף דו מימדי (2d) עיצוב, פוטוגרפיה, איזוטרופי/אנאיזוטרופי טכניקות צריבה, צמיחה תחמוצת תרמית, לנקות פיראניה, ואחסון לקראת השגת אלה מיקרו טקסטורות. למרות החוכמה המקובלת מצביע על משטחי הרטבה מיסודה המסיס (θo < 90 °) מעבד אותם אפילו יותר הרטבה (θr ≪ θo < 90 °), אבני חן להדגים דוחה נוזלים למרות wettability הפנימי של המצע. למשל, למרות wettability הפנימית של סיליקה θo ≈ 40 ° עבור מערכת המים/אוויר, ו θo ≈ 20 ° עבור מערכת hexadecane/אוויר, אבני חן המורכב חללים וכד אוויר מכבש על הטבילה בנוזלים אלה, ואת זוויות מגע לכאורה עבור טיפות הם θr > 90 °. תכונות re, מחדש וכפליים באבני חן לייצב את מניסקוס נוזלי מפריעה ובכך ללכוד את נוזלי-מוצק-אדי מערכת במצבים ממולאים אוויר מלא (קאסי מדינות) ועיכוב מעברים הרטבה למצב התרמודינמי יציב מלא (מדינת ונצל) על ידי, למשל, שעות עד חודשים. באופן דומה, SiO 2/Si משטחים עם מערכים של מיקרו-עמודים מחדש ומיקרואוניים כפליים מדגימים זוויות מגע גבוהות במיוחד (θr ≈ 150 ° – 160 °) והיסטרזיס בעלת זווית מגע נמוכה לנוזלי הבדיקה, ובכך מאופיין כסופראופובי. עם זאת, על שקיעה באותם נוזלים, משטחים אלה מאבדים באופן דרמטי את superomniphobicity שלהם ולקבל מלא בתוך < 1. כדי לטפל באתגר זה, אנו מציגים פרוטוקולים עבור עיצובים היברידיים המרכיבים מערכים של עמודים מחדש כפליים מוקף קירות עם פרופילים מחדש כפליים. ואכן, מיקרוטקסטורות היברידיות הינן אוויר לטבילה בנוזלי המקדח. לסיכום, הפרוטוקולים המתוארים כאן צריך לאפשר את החקירה של אבני חן בהקשר של השגת אומניפוטביטי ללא ציפויים כימיים, כגון בהופעה, אשר עשוי לפתוח את היקף של חומרים נפוצים זולים עבור יישומים כמו חומרים אומניפובי. מיקרוטקסטורות סיליקה יכולות לשמש גם כתבניות לחומרים רכים.
Introduction
משטחים מוצקים המוצגים זוויות מגע לכאורה, θr > 90 ° עבור נוזלים קוטבי ושאינו קוטבי, כגון מים וhexadecane, מכונים אומניפובי1. משטחים אלה משמשים יישומים מעשיים רבים, כולל התפלת מים2,3, מי שמן הפרדה4,5, antiביוקציה6, וצמצום הידרודינמי גרור7. בדרך כלל, מחייבת אומניפוטביטי כימיקלים בהופעה וטופוגרפיות אקראיות8,9,10,11,12. עם זאת, העלות, הלא-biodegradability, והפגיעות של אותם חומרים/ציפויים מהווים מספר גדול של אילוצים, לדוגמה, ממברנות התפלה של התפלת לבזות כאשר הטמפרטורות בצד ההזנה מורמות, המוביל לנקבובית הרטבה 13,14, ו ציפויים לחות/פחממיים גם לקבלשלושעשרה,16 ומושפל על ידי חלקיקי ה לפיכך, יש צורך באסטרטגיות חלופיות להשגת הפונקציות של ציפויים מוחדרים (כלומר, האוויר מאיר את הטבילה בנוזלים מבלי להשתמש בציפוי דוחה מים). לכן, החוקרים הציעו טופוגרפיות של פני השטח המורכב של התכונות שיכול להיות האוויר על טבילה על ידי microtexturingלבד 17,18,19,20,21,22,23,24,25. אלה מיקרוטקסטורות מגיעים בשלושה סוגים: חללים26, עמודים27, מחצלות סיבי8. להלן, נתייחס לתכונות מחדש עם היתר פשוטה כמו reנכנס (איור 1A – B ואיור 1E – F) ותכונות re, עם רפסות שעושים 90 °-לפנות לכיוון הבסיס כפליים מחדש (איור 1C – D ואיור 1G – H).
בעבודתם החלוצית, ורנר ואח '22,28,29,30,31 מאופיין ציפורנייך של ספרינגפלי (קולמבולה), קרקע-מגורים פרוקי רגליים, והסביר את המשמעות של בצורת פטריות (reבנמלה) תכונות בהקשר של הרטבה. אחרים חקרו גם את התפקיד של שערות בצורת פטריה בים-מחליקים32,33 לקראת הקלה על דוחה מים קיצוניים. ורנר ועמיתים לעבודה הפגינו את אומניפוטביטי של משטחים פולימריים מיסודה של הרטבה על ידי גילוף מבנים ביונטיים באמצעות ליתוגרפיה הפוכה29. ליו וקים דיווחו על משטחי סיליקה מעוטר מערכים של עמודים מחדש כפליים כי יכול להדוף טיפות של נוזלים עם מתיחות פני השטח נמוך כמו γLV = 10 mN/m, מאופיין בזוויות מגע לכאורה, θr ≈ 150 ° ומאוד נמוכה זווית מגע היסטרזיס27. בהשראת ההתפתחויות המדהימות האלה, עקבנו אחר המתכונים של ליו וקים לשכפל את התוצאות שלהם. עם זאת, גילינו כי אלה מיקרוטקסטורות היו מאבדים באופן מסיבי את superomniphobicity שלהם, כלומר θr → 0 °, אם הרטבה טיפות נוזל נגע בקצה של המיקרו מרקם או אם היה נזק פיזי מקומי34. ממצאים אלה הראו כי העמוד מבוססי מיקרוטקסטורות היו לא מתאים ליישומים שנדרשו אומניפוטביטי על הטבילה, והם גם חקרו את הקריטריונים להערכת אומניפוטביניטי (כלומר, יש להגביל את זוויות המגע בלבד, או אם יש צורך בקריטריונים נוספים).
בתגובה, באמצעות הוייפרים2/Si של SiO, הכנו מערכים של חללים מיקרוסקאלה עם אינלטס מחדש כפליים, ושימוש במים והhexadecane כמו נוזלי הקוטב והלא קוטבי, הדגמנו כי (אני) אלה מיקרוטקסטורות למנוע נוזלים מלהיכנס אותם על ידי אוויר הראפ, ו (ii) האדריכלות ממדר של חללים מונע אובדן של אוויר לכוד על ידי פגמים מקומיים34 כך, יש לנו לכנות אלה מיקרוטקסטורות כמו "מיקרוטקסטורות גז מיקרו" (אבני חן). כמו בשלב הבא, אנו מיקרופוברק אבני חן עם צורות שונות (עגול, מרובע, משושה) ופרופילים (פשוט, מחדש, וכפול re, וכפליים) כדי להשוות באופן שיטתי את הביצועים שלהם תחת שקיעה בנוזלי הרטבה26. יצרנו גם מיקרוטקסטורה היברידית הכוללת מערכים של עמודים מחדש כפליים מוקפים בקירות עם פרופילים מחדש כפליים, אשר מנעו נוזלים לגעת בגבעולים של העמודים והאוויר ברובודי האויר על שקיעה35. להלן, אנו מציגים פרוטוקולים מפורטים לייצור אבני חן על משטחים SiO2/Si באמצעות ליתוגרפיה וטכניקות תחריט יחד עם פרמטרי עיצוב. אנו מציגים גם תוצאות מייצגות של אפיון הרטבה שלהם באמצעות זווית מגע goniometry (מתקדם/נסוג/כפי ממוקם זוויות) וטבילה hexadecane ומים.
Protocol
הערה: מערכי החללים החוזרים והעמודים המרובים הינם מיוצרים על ידי התאמת פרוטוקול רב לעמודים שדווחו על ידי ליו וקים27. אמצעי זהירות נלקחו כדי למזער את היווצרות של שאריות סיכה או חלקיקים על משטחים שלנו שיכול להפריע הרטבה מעברים36.
מיקרוייצור חללים
באופן כללי, הפרוטוקולים למיקרו-הייצור של חללים מסוג rein וכפליים (rcs ו-drcs) מורכבים מעיצוב דו מימדי, פוטוגרפיה, תחריט סיליקה כללי ותחריט סיליקון ספציפי, בהתאם לתכונה הסופית הנדרשת37,38,39,40,41.
1. עיצוב
- הפעל את תהליך המיקרו-ייצור על-ידי עיצוב התבנית הנדרשת בתוכנת פריסה42. דוגמה לתוכנה כזאת מפורטת ברשימת החומרים.
- באמצעות התוכנה, צור קובץ חדש. צייר תא יחידה המורכב מעגל קוטר, D = 200 יקרומטר. העתק והדבק מעגל זה עם מרחק מרכז למרכז (גובה) של L = 212 יקרומטר כדי ליצור מערך של עיגולים בתיקון מרובע של שטח 1 ס מ2 (איור 2).
- צייר מעגל של קוטר 100 מ"מ (4 אינץ '). הצב את מערך הריבוע 1 ס מ2 בתוך המעגל ושכפל אותו כדי ליצור רשת 4 x 4 של מערכים רבועים. תכונות בתוך המעגל יועברו על וופלים 4 אינץ ' (איור 2).
- יצא את קובץ העיצוב לפורמט הרצוי של מערכת כתיבת המסיכה (לדוגמה, תבנית GDSII כון).
2. ניקוי של ופלים
- נקי סיליקון וופל 4 אינצ'ים בקוטר, < 100 > אוריינטציה, עם 2.4 יקרומטר עבה שכבת תחמוצת תרמית (לראות את רשימת החומרים), בפתרון פיראניה עבור 10 דקות. פיראניה פתרון מורכב חומצה גופרתית(h2 SO4, 96%): מימן חמצן(h 2O2, 30%) ביחס נפחי 3:1 ומתוחזק ב- T = 388 K.
- שטפו את הרקיק במים מתיילים ומסתובבים תחת חנקן (N2) בסביבה.
3. פוטוליתוגרפיה
- לחלוק את הפרוסת עם הבוחנים (HMDS) באמצעות התצהיר השלב אדי כדי לשפר את הדבקה עם photoresist. עיין בטבלה 1 עבור פרטי התהליך.
- הר וופל על צ ' אק 4 אינץ ' שואב אבק הספין. לכסות את וופל עם photoresist AZ-5214E. השתמש במשטח הספין כדי לפזר את הphotoresist אחיד על פני השטח כשכבה בעובי של 1.6 μm. התייחס לטבלה 2 עבור פרמטרים של ציפוי ספין.
- אופים photoresist מצופה וופל על צלחת חמה הנשמרת ב 110 ° c עבור 120 s.
- להעביר את וופל למערכת כתיבה ישירה ולחשוף את וופל לקרינת UV עבור 55 ms (defocus: +5). שלב זה מעביר את העיצוב הרצוי על AZ-5214E (משמש בנימה חיובית; ראה רשימת חומרים) (איור 2).
- המקום וופל חשוף UV בצלחת פטרי זכוכית המכילה את מפתח AZ-726 עבור 60 s עבור התכונות להתפתח. לפרטים, ראו רשימת חומרים .
- הסר את וופל מן הפתרון המפתחים ולשטוף עם מים מוכי (DI) בעדינות כדי להסיר מפתח עודף. ספין יבש את הופל בסביבה N2 . שלבים אלה מוצגים באיור 3א – ג.
הערה: בסוף שלב זה, תבניות עיצוב על וופל ניתן לראות תחת מיקרוסקופ אופטי רגיל.
4. חריטה אנאיזוטרופי של סיליקה (SiO2) שכבה
הערה: המטרה של שלב זה היא לחרוט לחלוטין את שכבת סיליקה (2.4 μm-עבה) שנחשף במהלך הפוטוגרפיה כדי לחשוף את שכבת הסיליקון מתחת.
- לאחר הצילום, להעביר את וופל לתוך משולב בשילוב פלזמה (הקאמרי) מערכת חריטה (RIE) שעושה שילוב של אוקטלוציטוקלובוטאן (C4F8) ו חמצן (O2) גזים לחרוט סיליקה אנכית כלפי מטה (אנאיזוטרופי תחריט).
- הפעל את התהליך הקאמרי-RIE במשך כ -13 דקות כדי לחרוט את שכבת הסיליקה החשופה. התייחס לפרמטרים של הקאמרי הזמני בטבלה 3. בשלב זה, השכבה הphotoresist גם מקבלת לגמרי חרוט (איור 3C – D).
- כדי להבטיח כי עובי שכבת סיליקה בתוך הדפוסים הרצויים מצטמצם לאפס, כך ששכבת הסיליקון נחשפת, למדוד את עובי סיליקה הנותרים באמצעות השתקפות. התאימו את משך תקופת התחריט הבאה בהתאם לעוביים של שכבות הסיליקה (בעיקר בתוך ומסביב לתבניות).
הערה: השתקפות שימש למדידת העובי של שכבת סיליקה שנותרה43. לחילופין, כלים אחרים, כגון אליסומי או תרשים צבע אינטראקטיבי כדי לחזות את הצבע של SiO2 ועובי יכול לשמש גם44,45.
ההליכים המפורטים בשלבים 1 ו-4 נפוצים הן עבור שניהם מחדש וחללים מחדש כפליים. עם זאת, פרוטוקולי החריטה לשכבת הסיליקון שונים ומתוארים להלן:
5. חללים חוזרים
-
תחריט סיליקון אנאיזוטרופי
- לאחר החריטה על שכבת הסיליקה, העבירו את הפרוסת וופל למערכת הייטק-RIE העמוקה לחריטה סיליקון. הצעד הראשון מורכב שיטה מבוססת פלואור חריטה אנאיזוטרופי המכונה תהליך בוש כי חורט סיליקון אנכית למטה, יצירת קיר ישר.
הערה: הליך בוש משתמש ב-C4F8 ו גופרית hexafluoride (SF6) גזים בחדר התגובות: התצהיר C4f8 יוצר שכבת פסיבציה, בעוד SF6 חורט סיליקון אנכית כלפי מטה. לפיכך, תהליך בוש מאפשר את המיקרו-הייצור של התעלות העמוקות בסיליקון עם יחס גבוה. - הפעל תהליך זה עבור חמישה מחזורים, אשר מתאים לעומק חריטה עבור סיליקון המקבילה ל ≈ 2 μm. פרמטרי תהליך מפורטים בטבלה 4.
- נקו את הרקיק בתמיסה פיראניה למשך 10 דקות כדי להסיר את כל השרידים מתהליך בוש. לשטוף את וופל עם מים DI ו-ספין יבש בסביבה N2 (איור 3E).
- לאחר החריטה על שכבת הסיליקה, העבירו את הפרוסת וופל למערכת הייטק-RIE העמוקה לחריטה סיליקון. הצעד הראשון מורכב שיטה מבוססת פלואור חריטה אנאיזוטרופי המכונה תהליך בוש כי חורט סיליקון אנכית למטה, יצירת קיר ישר.
- תחריט סיליקון איזוטרופי: כדי ליצור את התכונה מחדש, לבצע תחריט איזוטרופי שיגרום לערער מתחת לשכבת סיליקה. A 5 יקרומטר סככה יכול להיות מושגת על ידי תצריב שכבת סיליקון עם SF6 עבור 2 דקות 45 s (איור 3F). עיין בטבלה 5 עבור פרמטרי התהליך.
-
תחריט סיליקון אנאיזוטרופי: לאחר שנוצרים תכונות מחדש, כוונן את עומק החללים בתהליך בוש (שלב 5.1).
הערה: כדי להרכיבו חללים עם עומק של h≈ 50 μm, 160 מחזורים של התהליך בוש נדרשים (איור 3G, שולחן 4). -
ניקוי ושמירת פרוסות וופל
- נקה את הפרוסת וופל באמצעות פתרון פיראניה כמתואר בשלב 2. לאחר שלב זה, הופל הופך סופרהידרופיפילית, המאופיין בזוויות מגע של מים, θo ≈ 0 °.
- לאחסן את וופל בצלחת פטרי זכוכית ומקום בתוך תנור ואקום נקי מתוחזק T = 323 K ו-ואקום לחץ PVac = 3.3 kPa עבור 48 h, לאחר מכן זווית המגע הפנימית של שכבת סיליקה מייצב ל θo ≈ 40 °.
- אחסן את הדגימות בארון נקי מצויד בחנקן כלפי חוץ (99%) זרימה, מוכנה לאפיון נוסף.
6. חללים החוזרים כפליים
- תחריט סיליקון אנאיזוטרופי: כדי ליצור חללים מחדש כפליים, בצע את שלבים 1, 2, 3, 4, ו 5.1 (ראה איור 4A – E).
-
תצריב סיליקון איזוטרופי
כדי ליצור תכונות מחדש כפליים, יש ליצור תחילה תכונות משוב. כדי להשיג זאת, בצע חריטה איזוטרופי כדי ליצור מתחת לשכבת סיליקה. לחרוט את שכבת הסיליקון עם SF6 עבור 25 (איור 4F). עיין בטבלה 5 עבור פרמטרי התהליך. לאחר מכן, נקה את הופל באמצעות פתרון פיראניה כמתואר בשלב 2. -
גידול בתחמוצת התרמית
- כדי להשיג תכונות מחדש כפליים, לגדל שכבה 500 ננומטר של תחמוצת תרמית על וופל, באמצעות מערכת התנור טמפרטורה גבוהה (איור 4G).
- מדדו את עובי שכבת תחמוצת באמצעות השתקפות.
הערה: החמצון בוצע על ידי חשיפת דגימות לסביבה הכוללת חמצן (O2) ואדי מים, המוביל חמצון רטוב של סיליקון בסביבה סגורה בטמפרטורות החל 800-1200 ° c.
- איכול סיליקה: בצע את אותו תהליך כפי שמתואר בשלב 4 כדי לחרוט סיליקה אנכית כלפי מטה עבור 3 דקות. כתוצאה מהחריטה האנאיזוטרופי, תחמוצת החום (500 ננומטר שכבת סיליקה עבה) היא חרוטה הרחק מן החלל, אך היא משאירה "לתלות יתר" לאורך הקירות הצדדית שיוצרים את הקצה החוזר כפליים בסופו של דבר (איור 4H, שולחן 3).
- תחריט סיליקון אנאיזוטרופי: חזור על חמישה מחזורים של התהליך בוש להעמיק את החללים על ידי ≈ 2 יקרומטר (איור 4I, טבלה 5). שלב זה הכרחי כדי להסיר את הסיליקון מאחורי התכונה החוזרת כפליים בשלב הבא. נקו את הרקיק בעזרת פתרון פיראנה.
- תחריט סיליקון איזוטרופי: בצע את החריטה איזוטרופי של סיליקון עבור 2 דקות ו-30 באמצעות הפרמטרים תהליך המתואר בטבלה 4. שלב זה יוצר חלל ריק (≈ 2 μm) מאחורי התחמוצת התרמית בשפך החלל, ומוביל לקצה השני השני (איור 4J).
- תחריט סיליקון אנאיזוטרופי: השתמש במתכון לתהליך בוש (שלב 5.1) עבור 160 מחזורים כדי להגדיל את עומק החללים עד h≈ 50 μm, (איור 4K, טבלה 5).
- ניקוי ושמירת פרוסות וופל: נקה את הפרוסת וופל באמצעות פתרון פיראניה ואחסן כמתואר בשלב 5.4 לעיל.
מיקרו-הייצור של העמוד
פרוטוקול התכנון לבדיית העמודים החוזרים ולעמודי התווך והכלאיים (המורכב מעמודים מעוצבים כפליים מוקפים בקירות) מורכב משלושה שלבים עיקריים: הכנה להכנת וופל, תחריט סיליקה ותחריט מיוחד. איור 5א-ג הצג את התצוגה העליונה של עיצוב הפריסה לעמודים מחדש ולעמודי מחדש כפליים, בעוד שאיור 5D – F מייצג את הפריסה של מערכים היברידיים. בחר את האפשרות שדה כהה של חשיפה UV על מנת לחשוף את הפרוסת כולה למעט התבנית באמצעות אותו photoresist (AZ5214E) (איור 6A – c ואיור 7א – ג). מלבד המינים האלה, התהליכים לניקוי הפרוסת וופל (שלב 2) וסיליקה תחריט (שלב 4) זהים.
7. עמודים מחדש
- תחריט סיליקון אנאיזוטרופי: לאחר ליתוגרפיה, חשיפה לקרני UV, פיתוח, וסיליקה תחריט עם התוספות לעמודים המתוארים לעיל (שלבים 1 – 4), להעביר את וופל למערכת הקאמרי הגבוה-RIE עמוק לחרוט את שכבת הסיליקון באמצעות תהליך בוש. שלב זה שולט בגובה העמודים. השתמש 160 מחזורים של תהליך בוש כדי להשיג עמודים של גובה, hP ≈ 30 יקרומטר (איור 6E, שולחן 5). נקה את הפרוסת כמתואר בשלב 2.
- תחריט סיליקון איזוטרופי: לבצע תחריט איזוטרופי באמצעות SF6 עבור 5 דקות כדי ליצור את הקצה מחדש על העמודים (איור 6F, שולחן 4). אורך התוצאה של העומס הוא 5 μm.
- ניקוי פיראניה ואחסון: נקה את הפרוסת וופל באמצעות פתרון פיראניה ואחסן כמתואר בשלב 5.4 לעיל.
8. עמודים וכלאיים מחדש כפליים
- תחריט סיליקון אנאיזוטרופי: לאחר התחריט SiO2, להעביר את הפרוסת וופל למערכת הקאמרי העמוק-RIE לחרוט את Si תחת שכבת SiO2 . לבצע חמישה מחזורים של תהליך בוש המתאים עומק חריטה של ≈ 2 יקרומטר (איור 7E, שולחן 4). לאחר מכן, נקו את הרקיק כפי שמתואר בשלב (2).
- תחריט סיליקון איזוטרופי: בצע צריבה איזוטרופי באמצעות SF6 עבור 16 s כדי ליצור את הקצה מחדש (שולחן 5, איור 7F). נקה את הפרוסת כמתואר בשלב 2.
- גידול תחמוצת תרמית: לגדול 500 שכבה ננומטר של תחמוצת תרמית בכל רחבי וופל באמצעות מערכת טמפרטורה גבוהה התנור כמתואר בשלב 6.3 (איור 7G).
- איכול סיליקה: לחרוט את שכבת תחמוצת תרמית מגודלים (500 ננומטר עבה) עבור 3 דקות כפי שמתואר בשלב 6.4 (איור 7H, שולחן 3).
- תחריט סיליקון אנאיזוטרופי: חזרו על 160 מחזורים של התהליך בוש (שולחן 4) כדי להגדיל את גובה העמודים (איור 7I). נקו את הרקיק כפי שמתואר בשלב 2 לעיל.
- תחריט סיליקון איזוטרופי: בצע חריטה איזוטרופי של סיליקון עבור 5 דקות באמצעות פרמטרי התהליך כפי שמתואר בטבלה 4. שלב זה יוצר את הקצה החדש כפליים (איור 7J). הרווח בין גזע העמוד לבין קצה מחדש כפליים הוא ≈ 2 μm.
- ניקוי ושמירת פרוסות וופל: נקה את הפרוסת וופל באמצעות פתרון פיראניה ואחסן כמתואר בשלב 5.4 לעיל.
איור 8 מייצג את רשימת התהליכים המשמשים במיקרו-בדיית החללים החוזרים והעמודים.
תוצאות
בסעיף זה, אנו להציג מחדש חללים מחדש כפליים (RCs ו-DRCs, איור 9) ו-מחדש ועמודים מחדש כפליים (rcs ו-Drcs, איור 10) מיקרופוברק באמצעות הפרוטוקולים המתוארים לעיל. כל החללים יש את הקוטר, Dc = 200 μm, את העומק, h3 ≈ 50 μm, ואת המרחק מרכז למרכז (או המגרש) בין חללים סמוכים להיות LC = Dc + 12 μm. באמצעות אותם פרוטוקולי ייצור, ניתן להכין חללים של צורות שאינן מעגליות, כפי שדווחו בעבר26.
קוטרו של הכיפה על גבי העמודים היה DP = 20 יקרומטר, וגובהם והגובה שלהם היו, בהתאמה, hP ≈ 30 יקרומטר ו- LP = 100 יקרומטר (איור 10).
הרטבה התנהגויות של מיקרו טקסטורות גז (אבני חן)
סיליקה שטוח (SiO2) הוא הרטבה מיסודה לעבר הנוזלים הקוטבי והלא קוטבי. למשל, זוויות מגע פנימי של טיפות של hexadecane (γLV = 20 mN/m ב 20 ° c) ומים (מתח פני השטח γLV = 72.8 mN/m ב 20 ° c) על סיליקה היו, בהתאמה, ו θo ≈ 20 ° ו θo ≈ 40 °. עם זאת, לאחר המיקרו-בדיית החללים החוזרים (DRCs) והעמודים, זוויות המגע השתנו באופן דרמטי (שולחן 6). אנו מודדים את זוויות המגע המתקדם/נסוג על ידי מעביר/לבטל את הנוזלים בקצב של 0.2 μL/s ומצא את זוויות מגע לכאורה עבור שני הנוזלים, θr > 120 °, (אומניפובי; איור 11E). מנסוג זוויות מגע, θr ≈ 0 ° בגלל חוסר הרציפות במיקרוטקסטורות, כגון במיקרו-מרקמים מבוססי עמוד. מצד שני, SiO2/Si משטחים עם מערכים של עמודים מחדש כפליים (drps) הציגו זוויות מגע לכאורה, θr > 150 ° עבור שני הנוזלים ואת זווית המגע היסטרזיס היה מינימלי (superomniphobic, איור 11A ו סרטים S1 ו-S2). באופן מוזר, כאשר אותו SiO2/Si משטחים עם מערכים של עמודים שקועים באותם נוזלים הם הגיע פולש באופן מיידי, t < 1 s, כלומר, לא האוויר היה לכוד (איור 10A – D, הסרט S3). כך, בעוד העמודים נראו בעלי מראה על זוויות מגע, הם לא הצליחו לשדר אוויר על הטבילה. למעשה, נוזלי הרטבה מתחטרים מגבולות המיקרוטקסטורה (או מפגמים מותאמים לשפות אחרות) ומכהים את האוויר הלכוד בכיוון מיידי (איור 11A – D ו-S3 הסרט). לעומת זאת, DRCs האוויר לכוד על הטבילה בשני נוזלים (איור 11E – H ו S1, שולחן 1); עבור hexadecane, האוויר לכוד היה שלם גם לאחר 1 חודש26. הניסויים הקונמיקרוסקופיה שלנו הראו כי התכונות התלויות מייצב את הנוזלים המפריעים והאוויר החרוט בתוכם (איור 12א – ב).
לאחר מכן, כדי לשדר אוויר במערכים של DRPs, העסקנו באותם פרוטוקולים מיקרוייצור כדי להשיג מערכים של עמודים מוקפים קירות של פרופיל כפול מחדש (איור 10G – I). האסטרטגיה הזאת מבודדת את הגבעולים מנוזלי הרטבה. כתוצאה מכך, מיקרוטקסטורות היברידית התנהגו כאבני חן, כפי שאושרו על-ידי מיקרוסקופ מוקדי (איור 12ג – ד) וסרט S4, שולחן 6). כך, משטחי סיליקה עם מיקרוטקסטורות היברידית הציגו אומניפוטביטי על הטבילה על ידי השמנה האוויר והפגינו זוויות מגע, θr > 120 °, (אומניפובי), והוכיח אומניפובי במובן האמיתי, כלומר, במונחים של זוויות מגע ואוויר הראפ על הטבילה. בטבלה 6, אנו להעריך את אומניפוטביניטי של SiO2/Si משטחים עם מגוון רחב של מיקרוטקסטורות חלל מבוסס, עמוד מבוסס, וכלאיים על ידי זוויות מגע וטבילה.
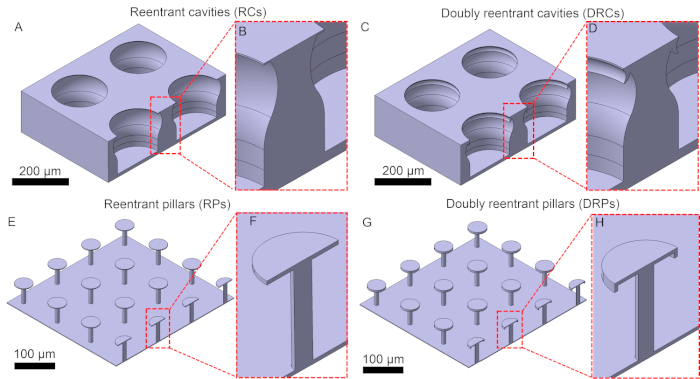
איור 1: שרטוט של מבני מיקרו. (א–ב) חללים חוזרים, (C-D) כפול חללים מחדש, (E-F) עמודים מחדש, (G–H) עמודים כפולה מחדש. אנא לחץ כאן כדי להציג גירסה גדולה יותר של איור זה.
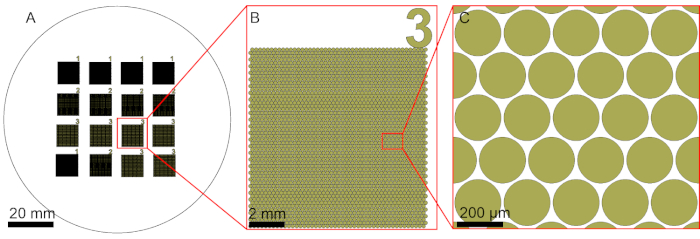
איור 2: דפוסי עיצוב עבור חללים. עיצוב דפוסי עבור מחדש חללים שנוצרו כפליים מחדש שנוצר באמצעות תוכנת הפריסה. התבנית הועברה אל וופל באמצעות פוטוליגרפיה. אנא לחץ כאן כדי להציג גירסה גדולה יותר של איור זה.

איור 3: פרוטוקול מיקרוייצור עבור חללים מחדש. (A) לנקות סיליקון וופל עם מ2.4 יקרומטר סיליקה עבה על גבי. (ב) ספין-מעיל את הפרוסת עם photoresist ולחשוף לאור UV. (ג) לפתח את הphotoresist החשופים של UV כדי לקבל את דפוס העיצוב. (ד) תחריט של שכבת הסיליקה העליונה החשופה אנכית כלפי מטה (תחריט אנאיזוטרופי) תוך שימוש בשילוב משולב של פלזמה (מע) (RIE). (ה) תחריט אנאיזוטרופי רדוד של שכבת סיליקון חשופה באמצעות א. ב. א. (F) תחריט איזוטרופי של סיליקון כדי ליצור את הקצה החדש. (ז) איכול אנאיזוטרופי עמוק להגדיל את עומק החללים. אנא לחץ כאן כדי להציג גירסה גדולה יותר של איור זה.
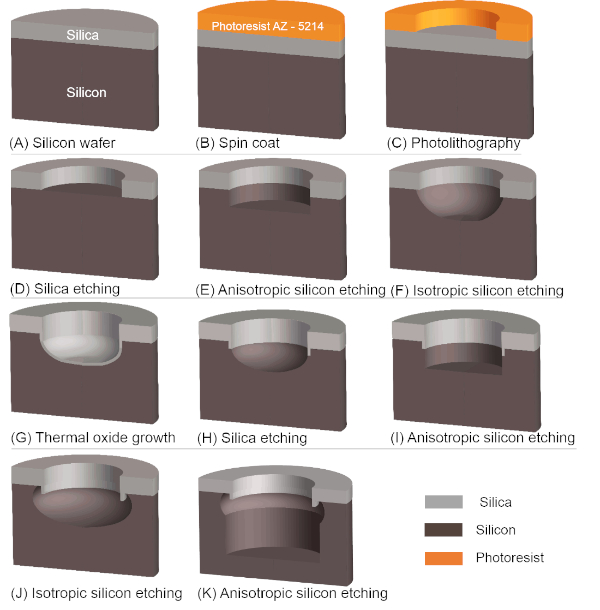
איור 4: פרוטוקול מיקרוייצור עבור חללים מחדש כפליים. (A) לנקות סיליקון וופל עם מ2.4 יקרומטר סיליקה עבה על גבי. (ב) ספין-מעיל את הפרוסת עם photoresist ולחשוף לאור UV. (ג) לפתח את הphotoresist החשופים של UV כדי לקבל את דפוס העיצוב. (ד) תחריט של שכבת הסיליקה העליונה החשופה אנכית כלפי מטה (תחריט אנאיזוטרופי) תוך שימוש בשילוב משולב של פלזמה (מע) (RIE). (ה) תחריט אנאיזוטרופי רדוד של שכבת סיליקון חשופה באמצעות א. ב. א. (F) איכול איזוטרופי רדוד של סיליקון כדי ליצור ערער באמצעות התנועה הבין-מעמיקה. (G) הצמיחה תחמוצת תרמית. (ח) אנאיזוטרופי חריטה של שכבת סיליקה העליון והתחתון. (I) איכול אנאיזוטרופי רדוד של סיליקון. (J) איכול סיליקון איזוטרופי כדי ליצור את הקצה החדש כפליים. (K) תצריב סיליקון עמוק אנאיזוטרופי כדי להגדיל את עומק החללים. אנא לחץ כאן כדי להציג גירסה גדולה יותר של איור זה.

איור 5: תבניות עיצוב לעמודים. תבניות עיצוב עבור מחדש, כפליים, ועמודים היברידיים שנוצרו באמצעות תוכנת הפריסה. התבנית הועברה אל וופל באמצעות פוטוליגרפיה. אנא לחץ כאן כדי להציג גירסה גדולה יותר של איור זה.
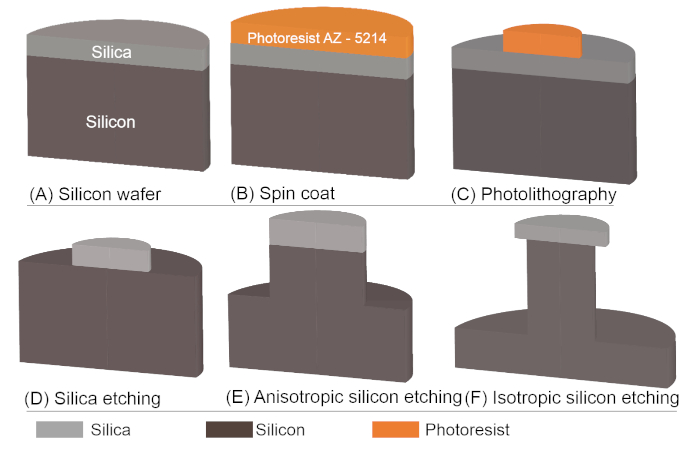
איור 6: פרוטוקול מיקרוייצור של עמודים מחדש. (A) לנקות סיליקון וופל עם מ2.4 יקרומטר סיליקה עבה על גבי. (ב) ספין-מעיל את הפרוסת עם photoresist ולחשוף לאור UV. (ג) לפתח את הphotoresist החשופים של UV כדי לקבל את דפוס העיצוב. (ד) תחריט של שכבת הסיליקה העליונה החשופה אנכית כלפי מטה (תחריט אנאיזוטרופי) תוך שימוש בשילוב משולב של פלזמה (מע) (RIE). (ה) תחריט סיליקון אנאיזוטרופי עמוק כדי להגדיל את גובה העמודים. (F) איכול סיליקון איזוטרופי כדי ליצור את הקצה החדש. אנא לחץ כאן כדי להציג גירסה גדולה יותר של איור זה.
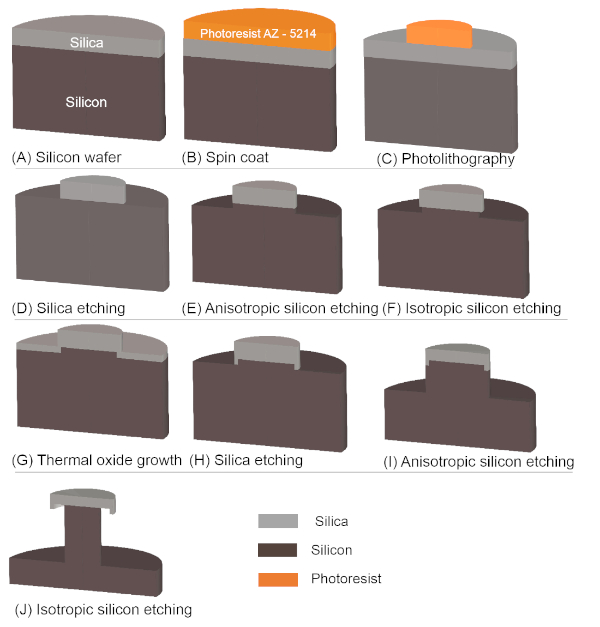
איור 7: פרוטוקול מיקרוייצור לעמודים מחדש כפליים. (A) לנקות סיליקון וופל עם מ2.4 יקרומטר סיליקה עבה על גבי. (ב) ספין-מעיל את הפרוסת עם photoresist ולחשוף לאור UV. (ג) לפתח את הphotoresist החשופים של UV כדי לקבל את דפוס העיצוב. (ד) תחריט של שכבת הסיליקה העליונה החשופה אנכית כלפי מטה (תחריט אנאיזוטרופי) תוך שימוש בשילוב משולב של פלזמה (מע) (RIE). (ה) תחריט אנאיזוטרופי רדוד של שכבת סיליקון חשופה באמצעות א. ב. א. (F) איכול איזוטרופי רדוד של סיליקון כדי ליצור ערער באמצעות התנועה הבין-מעמיקה. (G) הצמיחה תחמוצת תרמית. (ח) אנאיזוטרופי תחריט של החלק העליון והתחתון של שכבת סיליקה. (I) חריטה סיליקון אנאיזוטרופי כדי להגדיל את גובה העמודים. (J) איכול סיליקון איזוטרופי כדי ליצור את הקצה החדש של כפליים. שים לב כי ההבדל היחיד בין עמודים מחדש כפול לבין "היברידית" הוא העיצוב בהתחלה. אנא לחץ כאן כדי להציג גירסה גדולה יותר של איור זה.

איור 8: פרוטוקול מיקרוייצור לחללים מחדש ולעמודים מחדש כפליים. תרשים הזרימה מפרט את שלבי המפתח המעורבים. אנא לחץ כאן כדי להציג גירסה גדולה יותר של איור זה.
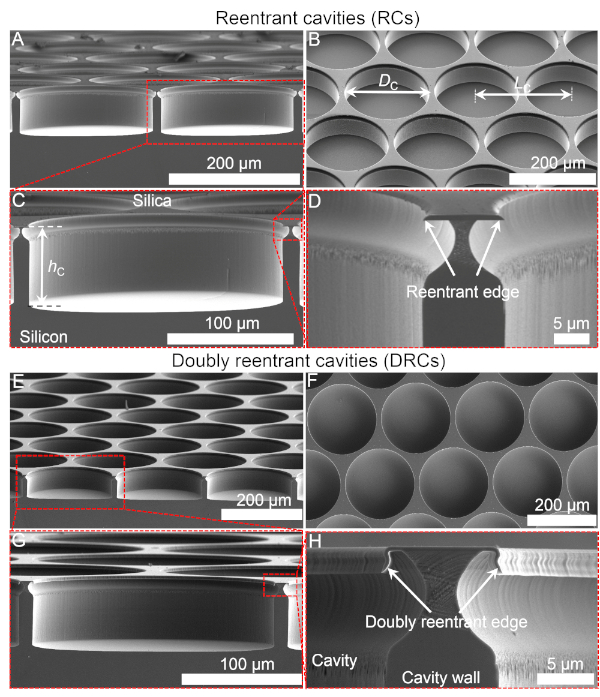
איור 9: סריקת מיקרוגרפים אלקטרונים בעלי חורים וחללים מחדש כפליים. (א – ד) משטחי סיליקה עם חתך מוצלבות ומגוון של חללים מורכבים. (E – H) חתך מוצלבות ותצוגות מובילות של חללים מחדש כפליים. Dc = קוטר החלל ו- LC = המרחק ממרכז למרכז בין חללים סמוכים (או זפת), ו- hc = עומק החלל. אנא לחץ כאן כדי להציג גירסה גדולה יותר של איור זה.
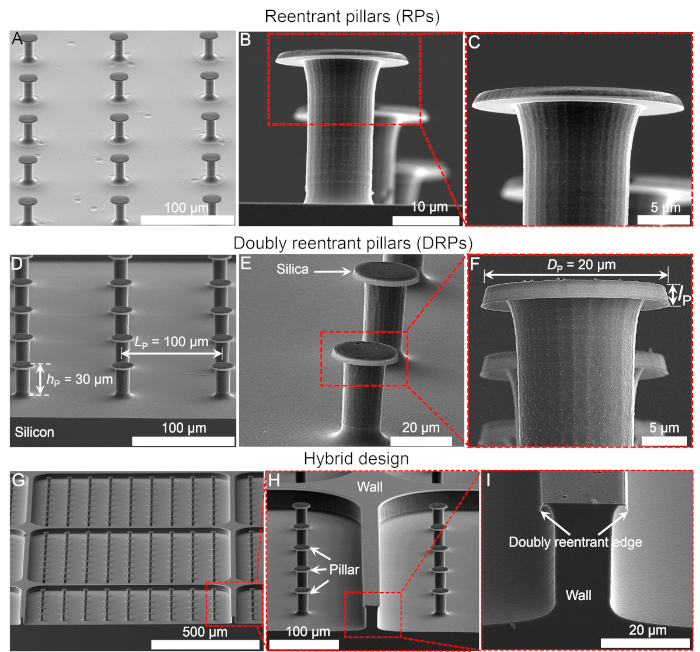
איור 10: סריקת מיקרוגרפים אלקטרונים בעלי מבנה מחדש ועמודים מחדש כפליים. (א – ג) תצוגה איזומטרי של עמודים מחדש. (D – F) . עמודים מחדש כפליים (G – I) עמודים היברידיים-DRPs מוקף קירות מחדש כפליים. D-קוטר של כובע העמוד ו- Lp -המרחק ממרכז למרכז בין עמודים סמוכים (או זפת), ו- hp -גובה העמודים. איור D–I, הודפס מתוך Ref.35, זכויות יוצרים (2019), באישור אחר וייה. אנא לחץ כאן כדי להציג גירסה גדולה יותר של איור זה.

איור 11: התנהגות הרטבה. (א) סופר-אומניפוטביטי של SiO2/Si משטחים מעוטרים במערכים כפליים עמודים, הנצפים על ידי הצבת טיפות נוזלי על גבי. (ב – ד) הסופראומניפוביטי אובד מיידי, אם נוזלי הרטבה נוגעים בגבולות או בפגמים שהותאמה לשפות אחרות. (E) SiO 2/סי משטחים מעוטרים במערכים כפולמשניחללים מוצגים בתצוגה אומניפוטביטי. (F – H) אלה מיקרוטקסטורות האוויר ברובלי וללא לאבד אותו אם הנוזל נוגע בגבולות או פגמים מקומי. הודפסה מודפס מתוך Ref.35, זכויות יוצרים (2019), באישור אחר וייה. אנא לחץ כאן כדי להציג גירסה גדולה יותר של איור זה.

איור 12: מיקרוסקופיה קונפוקלית של מיקרוטקסטורות שקועים בנוזלים. מחשב משופר 3d שחזורים של הנציגה מיקוד תמונות (איזומטרי וחתכים לאורך קווים מנוקדים) של מעברי הרטבה בשטחי סיליקה עם חללים קריאות כפול ועמודים היברידי שקוע תחת z ≈ 5 מ"מ עמודה לאחר 5 דקות של טבילה (a,C) מים, ו (ב,D) hexadecane. הצבעים הכחולים והצהובים מתאימים לממשקי המים והhexadecane עם האוויר הנלכד. מנדיצי נוזלים מפריעים. התייצבו בקצה של כפליים (סרגל קנה מידה = קוטר של חלל ועמוד 200 יקרומטר ו 20 יקרומטר בהתאמה). איור 12 הודפס מתוך Ref.35, זכויות יוצרים (2019), באישור אחר וייה. אנא לחץ כאן כדי להציג גירסה גדולה יותר של איור זה.
| שלב 1: התייבשות וטיהור חמצן מן החדר | ||
| צעד | רצף תהליכים | זמן (מזערי) |
| 1 | ואקום (10 Torr) | 1 |
| 2 | חנקן (760 Torr) | 3 |
| 3 | ואקום (10 Torr) | 1 |
| 4 | חנקן (760 Torr) | 3 |
| מיכל 5 | ואקום (10 Torr) | 1 |
| 6 | חנקן (760 Torr) | 3 |
| שלב 2: הטרמה | ||
| רצף תהליכים | זמן (מזערי) | |
| 7 | ואקום (1 Torr) | 2 |
| 8 | היירופאים (6 Torr) | מיכל 5 |
| שלב 3: מטהר את המפלט הראשוני | ||
| רצף תהליכים | זמן (מזערי) | |
| 9 | ואקום | 1 |
| 10 | חנקן | 2 |
| 11 | ואקום | 2 |
| שלב 4: חזרה לאטמוספירה (מילוי מאחור) | ||
| רצף תהליכים | זמן (מזערי) | |
| 12 | חנקן | 3 |
טבלה 1: פרטי התהליך לציפוי השכבות (HMDS) שכבות כדי לשפר את הדבקה בין פני השטח סיליקה ו-AZ-5214E photoresist.
| צעד | מהירות (rpm) | כבש (rpm/s) | זמן (ים) |
| 1 | 800 | 1000 | 3 |
| 2 | 1500 | 1500 | 3 |
| 3 | 3000 | 3000 | 30 |
טבלה 2: פרטי התהליך עבור השגת 1.6 μm-עבה AZ-5214E photoresist שכבה ב-SiO2/Si וופלים על ידי ציפוי ספין.
| כוח RF, (W) | הכוח הקאמרי החשמלי, (W) | לחץ תחריט (mTorr) | C4F8 זרימה (sccm) | O2 זרימה (sccm) | טמפרטורה (° c) |
| 100 | 1500 | 10 | 40 | מיכל 5 | 10 |
שולחן 3: הגדרות הפרמטרים לתחריט סיליקה המשמשות בשילוב משולב באמצעות פלזמה-מיון
| כוח RF, (W) | הכוח הקאמרי החשמלי, (W) | לחץ תחריט (mTorr) | SF6 זרימה, (sccm) | טמפרטורה (° c) |
| 20 | 1800 | 35 | 110 | 15 |
טבלה 4: הגדרות פרמטרים לחריטה סיליקון (איזוטרופי) המשמשות בשילוב משולב של פלזמה-איכול עמוק (באמצעות הקאמרי-DRIE).
| צעד | כוח RF, (W) | הכוח הקאמרי החשמלי, (W) | לחץ תחריט (mTorr) | SF6 זרימה, (sccm) | C4F8 זרימה (sccm) | טמפרטורה (° c) | התצהיר/זמן החריטה (ים) |
| שכבת פסיבציה | מיכל 5 | 1300 | 30 | מיכל 5 | 100 | 15 | מיכל 5 |
| תחריט | 30 | 1300 | 30 | 100 | מיכל 5 | 15 | 7 |
שולחן 5: הגדרות פרמטרים לחריטה סיליקון (אנאיזוטרופי) המשמשות בשילוב משולב פלזמה-איכול עמוק (הקאמרי-DRIE).
| משטחים | קריטריון: זוויות מגע באוויר | קריטריון: הטבילה | |||
| מים | Hexadecane | מים | Hexadecane | ||
| האגודה לסוכרת נעורים | θr | 153 ° ± 1 ° | 153 ° ± 1 ° | חדירה מיידית | חדירה מיידית |
| θA | 161 ° ± 2 ° | 159 ° ± 1 ° | |||
| θR | 139 ° ± 1 ° | 132 ° ± 1 ° | |||
| ערכה | סופר-אומניפובי | לא באומניפובי – למעשה, אומניפילי | |||
| הפקולטה למדעי הדרום | θr | 124 ° ± 2 ° | 115 ° ± 3 ° | לכוד באוויר (אומפופובי) | לכוד באוויר (אומפופובי) |
| θA | 139 ° ± 3 ° | 134 ° ± 5 ° | |||
| θR | 0 ° | 0 ° | |||
| ערכה | אומניפובי | אומניפובי | |||
| כלאיים | θr | 153 ° ± 2 ° | 153 ° ± 2 ° | לכוד באוויר (אומפופובי) | לכוד באוויר (אומפופובי) |
| θA | 161 ° ± 2 ° | 159 ° ± 2 ° | |||
| θR | 0 ° | 0 ° | |||
| ערכה | אומניפובי | אומניפובי | |||
טבלה 6: מדידות זווית מגע – קידום(θA), נסוג(θr), ולכאורה (θR) – וטבילה בנוזלים. טבלה זו מודפסה מתוך Ref.35, זכויות יוצרים (2019), באישור אחר וייה.
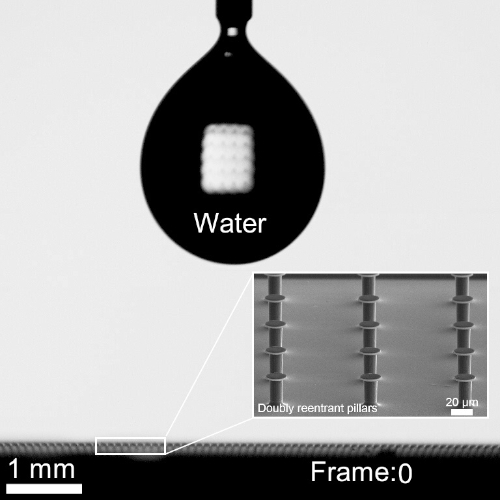
סרט S1: רצף תמונה במהירות גבוהה (15K fps) של droplet מים הקפצה מתוך משטחים מיקרועם בעלי מרקם המורכב של עמודים מחדש כפליים. הסרט הודפס מתוך ref 35. זכויות יוצרים (2019), באישור אחר וייה. אנא לחץ כאן כדי להציג וידאו זה (לחץ לחיצה ימנית כדי להוריד).
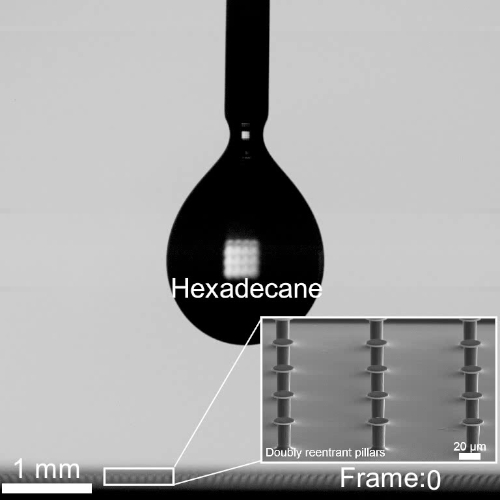
סרט S2: רצף תמונה במהירות גבוהה (19K fps) של hexadecane droplet משתקף מתוך משטחים מיקרועם מרקם המורכב של עמודים מחדש כפליים. הסרט הודפס מתוך ref 35. זכויות יוצרים (2019), באישור אחר וייה. אנא לחץ כאן כדי להציג וידאו זה (לחץ לחיצה ימנית כדי להוריד).
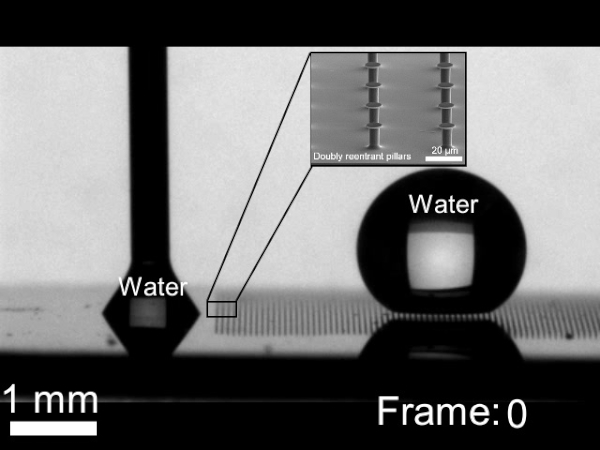
S3 סרט: רצף התמונות (200 fps) של שתיית מים בתוך מיקרוטקסטורה הכוללת עמודים מחדש כפליים. הסרט הודפס מתוך ref 35. זכויות יוצרים (2019), באישור אחר וייה. אנא לחץ כאן כדי להציג וידאו זה (לחץ לחיצה ימנית כדי להוריד).
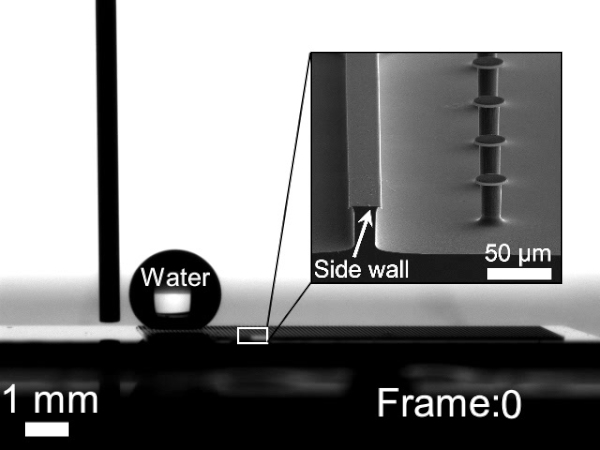
סרט S4: רצף התמונה (200 fps) מים טיפה לקידום ליד מיקרוטקסטורה היברידית. הנוכחות של קיר גבול מחדש כפליים מונעת הפלישה נוזלי לתוך המיקרוטקסטורה, מה שהופך את המשטח אומניפובי תחת טבילה גם. הסרט הודפס מתוך ref 35. זכויות יוצרים (2019), באישור אחר וייה. אנא לחץ כאן כדי להציג וידאו זה (לחץ לחיצה ימנית כדי להוריד).
Discussion
כאן אנו דנים בגורמים נוספים ובקריטריוני העיצוב כדי לסייע לקורא ליישם פרוטוקולים אלה מיקרו-ייצור. עבור מיקרוטקסטורות חלל (RCs ו-DRCs) הבחירה של המגרש היא חיונית. קירות דקים יותר בין חללים סמוכים יוביל לאזור נוזלי מוצק הפנים הפנימי והפנים הגבוהה אדים נוזלי באזור, המוביל זוויות מגע לכאורה גבוהה34. עם זאת, קירות דקים עלולים לסכן את השלמות המכנית של המיקרוטקסטורה, למשל, במהלך הטיפול והאפיון; קצת יותר מדי תחריט עם קירות דקים (למשל, בשלב 6.6) יכול להרוס את כל מרקם המיקרו; מתחת לחריטה עם קירות דקים יכול גם למנוע התפתחות של תכונות מחדש כפליים. אם תכונות DRC אינם מפותחים באופן מלא, יכולתם להיות באוויר לטווח ארוך עלול לסבול, במיוחד אם הנוזל מתעבה בתוך חללים26. מסיבה זו, בחרנו את המגרש בניסויים שלנו להיות L = D + 12 יקרומטר (כלומר, עובי הקיר המינימלי בין החללים היה 12 יקרומטר). אנחנו גם מפוברק חללים מחדש כפליים עם המגרש קטן יותר של L = D + 5 μm, אבל המשטחים המתקבלים לא היו הומוגנית עקב נזק מבני במהלך microfabrication מיקרו.
במהלך החריטה של שכבת סיליקה עם C4F8 ו O2 בשלב 4, ההיסטוריה הקודמת של השימוש או הניקיון של תא התגובה יכול לתת תוצאות משתנה, למרות שלאחר השלבים הבאים, למשל, במתקן משתמש משותף כמו ברוב האוניברסיטאות. לפיכך, מומלץ ששלב זה יבוצע בפרקי זמן קצרים, למשל, לא יותר מ -5 דקות כל אחד ומנטר את עובי שכבת הסיליקה בטכניקה עצמאית, כגון השתקפות. עבור וופלים שלנו עם שכבת סיליקה 2.4 μm-עבה, שגרת תחריט טיפוסית לקחה 13 דקות כדי להסיר סיליקה לחלוטין מהאזורים המיועדים (שולחן 3). מכיוון photoresist היה גם חרוט במהלך התהליך, צעד זה הסיר 1 יקרומטר של שכבת סיליקה כי היה מוסווה בתחילה על ידי photoresist. יתרה מזאת, על מנת להבטיח שקצב החריטה היה צפוי, ולהימנע מזיהום בתהליכי התחריט הקודמים (בנושא משותף במתקנים מרובי-משתמשים), תחריט סיליקה תמיד לפניו על ידי חריטה של וופל הקורבן כצעד אמצעי זהירות. במהלך ההתפתחות של הphotoresist, המשטח החשוף עלול להידבק עם העקבות/חלקיקים של הphotoresist, אשר יכול לשמש (מיקרוסקופיים) מסכות המובילות היווצרות של שאריות סיכה. כדי למנוע זאת, יש לעקוב אחר פרוטוקולי הניקוי והאחסון הקפדניים במהלך תהליך המיקרוייצור36.
באופן דומה, במהלך התהליך בוש, אף על פי שהשכבה של SiO2 משמשת כמסיכה עבור ה-Si-layer שמתחת, היא מקבלת חריטה במהלך מחזורי תחריט ארוכים, אם כי בתעריפים איטיים יותר. לפיכך, עומק החללים או הגובה של העמודים מוגבל עד לנקודה שבה התכונות הנוספות לא יינחשפו. יש לכוונן את זמני הפסיבציה והחריטה בתהליך בוש כדי להשיג קירות חלקים. זה יכול להיות מושגת על ידי בדיקת מתכונים לסדר ולהתבונן ההשפעות שלהם על דגימות, למשל, באמצעות אלקטרון מיקרוסקופ.
במקרה של RPs ו-DRPs, ככל שמשך הזמן של תחריט איזוטרופי, קטן יותר קוטרו של הגבעול. אם הקוטר הוא פחות מ 10 μm, זה עלול להוביל לשבריו מכני. מגבלה זו צריכה ליידע את העיצוב בתחילת תהליך המיקרוייצור.
כלים בעלי תחריט יבש הזמינים באוניברסיטאות לא כוללים טולרנסים ברמה תעשייתית, המובילה למרחב הלא-uniformities מבחינת שיעור החריטה בתוך החדר. כך, התכונות המתקבלות במרכז של וופל עשוי לא להיות זהה לאלה בגבול. כדי להתגבר על מגבלה זו, השתמשנו באלה של ארבעה סנטימטרים ומרוכזים רק באזור המרכז.
כמו כן, אנו ממליצים להשתמש במערכות כתיבה ישירה במקום להשתמש במסיכות ליצירת קשר מהיר לפוטוגרפיה, המאפשר שינויים מהירים בפרמטרי העיצוב, כולל קטרים, מכרזים וצורות (מעגלי, משושה ומרובע), וכו '.
ברור, גם לא SiO2/Si וופלים או פוטוליתוגרפיה הם החומרים או התהליכים הרצויים לייצור המוני של משטחי אומניפובי. עם זאת, הם משמשים מערכת מודל מעולה כדי לחקור מיקרוטקסטורות חדשני עבור משטחים אומניפובי הנדסה, למשל על ידי ביומטיקה26,27,34,35,46,47, אשר ניתן לתרגם למערכות חומרים בעלות נמוכה ומדרגיים עבור יישומים. הוא צפוי כי בעתיד הקרוב, עקרונות העיצוב של אבני חן עשוי להיות מוקטן באמצעות טכניקות כגון הדפסה תלת-ממדית48, מוספים ייצור49, ו מיקרומטר לייזר50, בין היתר. מיקרו מרקם SiO2/Si משטחים יכול לשמש גם לתבנית חומרים רכים29,51. כיום, אנחנו חוקרים את היישומים של משטחי גז הראפ שלנו להפחתת הנזקה47, התפלה46,52, וצמצום הידרודינמי לגרור.
Disclosures
המחברים מצהירים שאין להם אינטרסים מתחרים.
Acknowledgements
HM מודה מימון של המלך עבדאללה אוניברסיטת המדע והטכנולוגיה (KAUST).
Materials
| Name | Company | Catalog Number | Comments |
| AZ-5214 E photoresist | Merck | DEAA070796-0W59 | Photoresist, flammable liquid |
| AZ-726 MIF developer | Merck | 10055824960 | To develop photoresist |
| Confocal microscopy | Zeiss | Zeiss LSM710 | Upright confocal microscope to visualize liquid meniscus shape |
| Deep ICP-RIE | Oxford Instruments | Plasmalab system100 | Silicon etching tool |
| Direct writer | Heidelberg Instruments | µPG501 | Direct-writing system |
| Drop shape analyzer | KRUSS | DSA100 | To measure contact angle |
| Hexadecane | Alfa Aesar | 544-76-3 | Test liquid |
| Highspeed imaging camera | Phantom vision research | v1212 | To image droplet bouncing |
| HMDS vapor prime | Yield Engineering systems | ||
| Hot plate | Cost effective equipments | Model 1300 | |
| Hydrogen peroxide 30% | Sigma Aldrich | 7722-84-1 | To prepare piranha solution |
| Imaris software | Bitplane | Version 8 | Post process confocal microscopy images |
| Nile Red | Sigma Aldrich | 7385-67-3 | Fluorescent dye for hexadecane |
| Nitrogen gas | KAUST lab supply | To dry the wafer | |
| Petri dish | VWR | HECH41042036 | |
| Reactive-Ion Etching (RIE) | Oxford Instruments | Plasmalab system100 | Silica etching tool |
| Reflectometer | Nanometrics | Nanospec 6100 | To check remaining oxide layer thickness |
| Rhodamine B (Acros) | Fisher scientific | 81-88-9 | Fluorescent dye for water |
| SEM stub | Electron Microscopy Sciences | 75923-19 | |
| SEM-Quanta 3D | FEI | Quanta 3D FEG Dual Beam | |
| Silicon wafer | Silicon Valley Microelectronics | Single side polished, 4" diameter, 500 µm thickness, 2.4 µm thick oxide layer | |
| Spin coater | Headway Research,Inc | PWM32 | |
| Spin rinse dryer | MicroProcess technology | Avenger Ultra -Pure 6 | Dry the wafers after piranha clean |
| Sulfuric acid 96% | Technic | 764-93-9 | To prepare piranha solution |
| Tanner EDA L-Edit software | Tanner EDA, Inc. | version15 | Layout design |
| Thermal oxide growth | Tystar furnace | To grow thermal oxide in patterned silicon wafer | |
| Tweezers | Excelta | 490-SA-PI | Wafer tweezer |
| Vacuum oven | Thermo Scientific | 13-258-13 | |
| Water | Milli-Q | Advantage A10 | Test liquid |
References
- Butt, H. J., et al. Characterization of super liquid-repellent surfaces. Current Opinion in Colloid & Interface Science. 19 (4), 343-345 (2014).
- Lee, J., Laoui, T., Karnik, R. Nanofluidic transport governed by the liquid/vapour interface. Nature Nanotechnology. 9 (4), 317-323 (2014).
- Subramanian, N., et al. Evaluating the potential of superhydrophobic nanoporous alumina membranes for direct contact membrane distillation. Journal of Colloid and Interface Science. 533, 723-732 (2019).
- Xue, Z. X., Cao, Y. Z., Liu, N., Feng, L., Jiang, L. Special wettable materials for oil/water separation. Journal of Materials Chemistry A. 2 (8), 2445-2460 (2014).
- Zhang, L. B., Zhong, Y. J., Cha, D., Wang, P. A self-cleaning underwater superoleophobic mesh for oil-water separation. Scientific Reports. 3, (2013).
- Leslie, D. C., et al. A bioinspired omniphobic surface coating on medical devices prevents thrombosis and biofouling. Nature Biotechnology. 32 (11), 1134-1140 (2014).
- Lee, C., Choi, C. H., Kim, C. J. Superhydrophobic drag reduction in laminar flows: a critical review. Experiments in Fluids. 57 (176), (2016).
- Tuteja, A., Choi, W., Mabry, J. M., McKinley, G. H., Cohen, R. E. Robust omniphobic surfaces. Proceedings of the National Academy of Sciences of the United States of America. 105 (47), 18200-18205 (2008).
- Brown, P. S., Bhushan, B. Mechanically durable, superoleophobic coatings prepared by layer-by-layer technique for anti-smudge and oil-water separation. Scientific Reports. 5, (2015).
- Wong, T. S., et al. Bioinspired self-repairing slippery surfaces with pressure-stable omniphobicity. Nature. 477 (7365), 443-447 (2011).
- Milionis, A., Dang, K., Prato, M., Loth, E., Bayer, I. Liquid repellent nanocomposites obtained from one-step water-based spray. Journal of Materials Chemistry A. 3 (24), 12880-12889 (2015).
- Mishra, H., et al. Time-Dependent Wetting Behavior of PDMS Surfaces with Bioinspired, Hierarchical Structures. ACS Applied Materials & Interfaces. 8 (12), 8168-8174 (2016).
- Hendren, Z. D., Brant, J., Wiesner, M. R. Surface modification of nanostructured ceramic membranes for direct contact membrane distillation. Journal of Membrane Science. 331 (12), 1-10 (2009).
- Rezaei, M., et al. Wetting phenomena in membrane distillation: Mechanisms, reversal, and prevention. Water Research. 139, 329-352 (2018).
- Verho, T., et al. Mechanically Durable Superhydrophobic Surfaces. Advanced Materials. 23, 673-678 (2011).
- Boinovich, L., Emelyanenko, A. M., Pashinin, A. S. Analysis of Long-Term Durability of Superhydrophobic Properties under Continuous Contact with Water. ACS Applied Materials & Interfaces. 2 (6), 1754-1758 (2010).
- Herminghaus, S. Roughness-induced non-wetting. Europhysics Letters. 52 (2), 165-170 (2000).
- Abdelsalam, M. E., Bartlett, P. N., Kelf, T., Baumberg, J. Wetting of regularly structured gold surfaces. Langmuir. 21 (5), 1753-1757 (2005).
- Liu, J. L., Feng, X. Q., Wang, G. F., Yu, S. W. Mechanisms of superhydrophobicity on hydrophilic substrates. Journal of Physics-Condensed Matter. 19 (35), (2007).
- Nosonovsky, M. Multiscale roughness and stability of superhydrophobic biomimetic interfaces. Langmuir. 23 (6), 3157-3161 (2007).
- Marmur, A. From hygrophilic to superhygrophobic: Theoretical conditions for making high-contact-angle surfaces from low-contact-angle materials. Langmuir. 24 (14), 7573-7579 (2008).
- Hensel, R., et al. Wetting Resistance at Its Topographical Limit: The Benefit of Mushroom and Serif T Structures. Langmuir. 29 (4), 1100-1112 (2013).
- Bormashenko, E. Progress in understanding wetting transitions on rough surfaces. Advances in Colloid and Interface Science. 222, 92-103 (2015).
- Patankar, N. A. Thermodynamics of trapping gases for underwater superhydrophobicity. Langmuir. 32 (27), 7023-7028 (2016).
- Kaufman, Y., et al. Simple-to-Apply Wetting Model to Predict Thermodynamically Stable and Metastable Contact Angles on Textured/Rough/Patterned Surfaces. The Journal of Physical Chemistry C. 121 (10), 5642-5656 (2017).
- Domingues, E. M., Arunachalam, S., Nauruzbayeva, J., Mishra, H. Biomimetic coating-free surfaces for long-term entrapment of air under wetting liquids. Nature Communications. 9 (1), 3606(2018).
- Liu, T. Y., Kim, C. J. Turning a surface superrepellent even to completely wetting liquids. Science. 346 (6213), 1096-1100 (2014).
- Hensel, R., Neinhuis, C., Werner, C. The springtail cuticle as a blueprint for omniphobic surfaces. Chemical Society Reviews. 45 (2), 323-341 (2016).
- Hensel, R., et al. Biologically Inspired Omniphobic Surfaces by Reverse Imprint Lithography. Advanced Materials. 26 (13), 2029-2033 (2014).
- Hensel, R., et al. Tunable nano-replication to explore the omniphobic characteristics of springtail skin. Npg Asia Materials. 5, (2013).
- Helbig, R., Nickerl, J., Neinhuis, C., Werner, C. Smart Skin Patterns Protect Springtails. PLOS ONE. 6 (9), 25105(2011).
- Cheng, L. Marine and Freshwater Skaters: Differences in Surface Fine Structures. Nature. 242, 132(1973).
- Andersen, N. M., Cheng, L. The marine insect Halobates (Heteroptera: Gerridae): biology, adaptations, distribution, and phylogeny. Oceanography and marine biology: an annual review. 42, 119-180 (2004).
- Domingues, E. M., Arunachalam, S., Mishra, H. Doubly Reentrant Cavities Prevent Catastrophic Wetting Transitions on Intrinsically Wetting Surfaces. ACS Applied Materials & Interfaces. 9 (25), 21532-21538 (2017).
- Arunachalam, S., Das, R., Nauruzbayeva, J., Domingues, E. M., Mishra, H. Assessing omniphobicity by immersion. Journal of Colloid and Interface Science. 534, 156-162 (2019).
- Christian Koch, E. A. Photolithography: Basics of Microstructuring. , MicroChemicals GmbH. (2017).
- Jansen, H., de Boer, M., Legtenberg, R., Elwenspoek, M. The black silicon method: a universal method for determining the parameter setting of a fluorine-based reactive ion etcher in deep silicon trench etching with profile control. Journal of Micromechanics and Microengineering. 5 (2), 115(1995).
- Jansen, H. V., de Boer, M. J., Unnikrishnan, S., Louwerse, M., Elwenspoek, M. C. Black silicon method X: a review on high speed and selective plasma etching of silicon with profile control: an in-depth comparison between Bosch and cryostat DRIE processes as a roadmap to next generation equipment. Journal of Micromechanics and Microengineering. 19 (3), 033001(2009).
- Xiu, Y., Zhu, L., Hess, D. W., Wong, C. Hierarchical silicon etched structures for controlled hydrophobicity/superhydrophobicity. Nano Letters. 7 (11), 3388-3393 (2007).
- Azeredo, B., et al. Silicon nanowires with controlled sidewall profile and roughness fabricated by thin-film dewetting and metal-assisted chemical etching. Nanotechnology. 24 (22), 225305(2013).
- Coffinier, Y., et al. Preparation of superhydrophobic silicon oxide nanowire surfaces. Langmuir. 23 (4), 1608-1611 (2007).
- Tanner, E. L-Edit-The layout editor. Reference Manual. , Available from: https://usermanual.wiki/Document/LEdit20Manual.38314693/view (2009).
- NANOSPEC 6100 Series Operators Users Manual. , Nanometrics. Available from: https://cmi.epfl.ch/metrology/Nanospec_AFT6100_Manual.pdf (2019).
- Deal, B. E., Grove, A. General relationship for the thermal oxidation of silicon. Journal of Applied Physics. 36 (12), 3770-3778 (1965).
- Woollam, J. A., et al. Spectroscopic ellipsometry from the vacuum ultraviolet to the far infrared. AIP Conference Proceedings. 550 (1), 511-518 (2001).
- Das, R., Arunachalam, S., Ahmad, Z., Manalastas, E., Mishra, H. Bio-inspired gas-entrapping membranes (GEMs) derived from common water-wet materials for green desalination. Journal of Membrane Science. , 117185(2019).
- Gonzalez-Avila, S. R., Nguyen, D. M., Arunachalam, S., Domingues, E. M., Mishra, H., Ohl, C. D. Mitigating cavitation erosion using biomimetic gas-entrapping microtextured surfaces. Science Advances. , In-press (2020).
- Liu, X., et al. 3D Printing of Bioinspired Liquid Superrepellent Structures. Advanced Materials. 30 (22), 1800103(2019).
- Jafari, R., Cloutier, C., Allahdini, A., Momen, G. Recent progress and challenges with 3D printing of patterned hydrophobic and superhydrophobic surfaces. The International Journal of Advanced Manufacturing Technology. , 1-14 (2019).
- Vorobyev, A. Y., Guo, C. L. Multifunctional surfaces produced by femtosecond laser pulses. Journal of Applied Physics. 117 (3), 033103(2015).
- Xu, M., Kim, C. J. Method for manufacturing re-entrant microstructures. US Patent App. , 15/546,260 (2018).
- Das, R., Arunachalam, S., Ahmad, Z., Manalastas, E., Syed, A., Buttner, U., Mishra, H. Proof-of-Concept for Gas-Entrapping Membranes Derived from Water-Loving SiO2/Si/SiO2 Wafers for Greener Desalination. Journal of Visualized Experiments. , In-press e60583(2020).
Reprints and Permissions
Request permission to reuse the text or figures of this JoVE article
Request PermissionExplore More Articles
This article has been published
Video Coming Soon
Copyright © 2025 MyJoVE Corporation. All rights reserved