Method Article
렌더링 SiO2/Si 표면 재진입 및 이중 재진입 구멍 또는 기둥을 포함하는 가스 를 포함하는 미세 질감을 조각하여 전지성
요약
이 작품은 포토리소그래피와 건식 에칭을 사용하여 SiO2/Si웨이퍼에서 재진입 및 이중 재진입 프로파일로 충치 및 기둥을 달성하기 위한 미세 가공 프로토콜을 제공합니다. 그 결과 미세 질감 표면은 실리카의 본질적인 습윤성에도 불구하고 습윤 액체 하에서 공기의 견고한 장기 트랩을 특징으로하는 놀라운 액체 발압을 보여줍니다.
초록
우리는 재진입 및 이중 재진입 기능을 가진 캐비티와 기둥으로 구성된 가스-포획 미세 질감(GEM)을 만들어 액체(옴닉포빅)에 본질적으로 습윤물질을 렌더링하기 위한 미세 가공 프로토콜을 제시합니다. 특히 SiO 2/Si를 모델 시스템으로 사용하고 2차원(2D) 설계, 포토리소그래피, 등방성/이방성 에칭 기술, 열산화물 성장, 피라냐 세척 및 저장을 위한 프로토콜을 공유합니다. 기존의 지혜는 본질적으로 습윤 표면(θo & 90 °)을 거칠게 하면 더 많은습윤(r & θo & 90 °)을 렌더링한다는 것을 나타내지만, GEM은 기판의 본질적인 습윤성에도 불구하고 액체 반발을 보여줍니다. 예를 들어, 물/공기 시스템에 대한 실리카 θo40°의 본질적인 습정성에도 불구하고, 헥사데카인/공기 시스템의 경우 θo □ 20°, 캐비티를 포함하는 GEM은 이러한 액체에 담그는 공기를 견고하게 포획하고, 방울에 대한 명백한 접촉 각도는 θ&90°이다. GEM의 재진입 및 이중 재진입 특징은 침입하는 액체 반월상 연골을 안정화시켜 메타안정 공기 충전 상태(Cassie state)에서 액체 고체 증기 시스템을 포획하고 열역학적으로 안정된 완전 충전 상태(Wenzel state)로의 습윤 전환을 지연시(예: 시간 에서 수개월)까지 지연시됩니다. 마찬가지로, 재진입 및 이중 재진입 마이크로필라어가 있는 SiO2/Si표면은 매우 높은 접촉 각도(θr °-160°)와 프로브 액체에 대한 낮은 접촉각 히스테리시스를 나타내며, 따라서 수퍼모닉포빅으로 특징지어진다. 그러나 동일한 액체에 침지하면 표면이 극적으로 초음과 공포증을 잃고 <1 s 내에서 완전히 채워질 수 있습니다. 이러한 문제를 해결하기 위해 이중 재진입 프로파일이 있는 벽으로 둘러싸인 이중 재진입 기둥배열로 구성된 하이브리드 설계용 프로토콜을 제시합니다. 실제로 하이브리드 마이크로 텍스처는 프로브 액체에 침지하여 공기를 포획합니다. 요약하자면, 여기에 설명된 프로토콜은 전지성 물질로 응용할 때 저렴한 일반 재료의 범위를 잠금 해제할 수 있는 퍼플루오로카본과 같은 화학 코팅없이 전지성을 달성하는 맥락에서 GEM의 조사를 가능하게 해야 합니다. 실리카 마이크로 텍스처는 또한 부드러운 재료의 템플릿역할을 할 수 있습니다.
서문
물과 헥사데카인과 같은 극성 및 비극성 액체에 대한 명백한 접촉 각, θr > 90°를 나타내는 고체 표면을 옴니포빅1이라고합니다. 이러한 표면은 물 담수화2,3,오일 - 물 분리4,5,항 생물 오염6및 유체 역학 적 항력7을포함한 수많은 실용적인 응용 프로그램을 제공합니다. 전형적으로, 전형적으로, 전형적으로, 전형적으로, 전형적으로, 전형적으로, 불소 화학제품 및 무작위 topographies8,9,10,11,12를필요로 한다. 그러나, 비용, 비 생분해성 및 이러한 재료/코팅의 취약성은 공급 측 온도가 상승함에 따라 퍼플루오르화 담수화 멤브레인이 저하되어 기공 습윤13,14,및 불소/탄화수소 코팅이 15, 16 및 멸실 화로 에 의해15,16 및 분해 되는 입자를 제거하여 무수한 제약 을 야기합니다. 따라서, 퍼플루오르화 코팅의 기능을 달성하기 위한 대체 전략이 필요하다(즉, 발수 코팅을 사용하지 않고 액체에 침지시 공기를 포획). 따라서연구자들은17,18,19,20, 21,22,23,24,25를마이크로텍스링하여 침수에 공기를 포획할 수 있는 돌출(reentrant) 기능으로 구성된 표면 내포를 제안했다. 이러한 미세 질감은 충치26,기둥27,섬유 매트8의세 가지 유형으로 제공됩니다. 여기서는 간단한 돌출부가 있는 재진입 피처를 재진입(그림1A-B 및 그림 1E-F)으로참조하고, 베이스를 향해 90°-회전을 이중 재진입(그림1C-D 및 그림 1G-H)으로만드는 오버행이 있는 재진입 피처를 참조합니다.
그들의 선구적인 작품에서, 베르너 외22,28,29,30,31 스프링 테일 (콜렘볼라), 토양 주거 절지동물의 특징, 젖은의 맥락에서 버섯 모양의 (재진입) 기능의 중요성을 설명했다. 다른 사람 또한 바다 스케이터에 버섯 모양의 머리카락의 역할을 조사32,33 극단적인 발수 촉진으로. 베르너와 동료들은 역인쇄물리소그래피(29)를통해 생체모방 구조를 조각함으로써 본질적으로 습윤하는 중합체 표면의 전능성을 입증하였다. Liu와 Kim은명백한 접촉 각도, θr ° 150 ° 및 매우 낮은 접촉 각 히스테리시스27을특징으로하는 표면 장력으로 액체의 방울을 격퇴 할 수있는 이중 재진입 기둥배열로 장식 된 실리카 표면에 보고했다. 이러한 놀라운 발전에서 영감을 얻은 우리는 리우와 김의 레시피를 따라 그 결과를 재현했습니다. 그러나, 우리는 그 마이크로 텍스처가 치명적으로 그들의 superomnibicity, 즉 θr → 0 °를 잃을 것이라는 것을 발견했습니다, 젖은 액체 방울이 마이크로 텍스처의 가장자리에 닿거나 국부적 인 물리적 손상이 있는 경우34. 이 사실 인정은 기둥 기지를 둔 마이크로 텍스처가 침지에 전지성을 요구하는 응용을 위해 부적당하다는 것을 보여주었습니다, 그리고 또한 전지성 평가를 위한 기준에 의문을 제기했습니다 (즉, 접촉 각도로 만 제한되어야 하거나 추가 기준이 필요한 경우).
이에 대응하여, SiO2/Si웨이퍼를 사용하여 이중 재진입제 유입구를 이용한 미세스케일 캐비티 배열을 준비하고, 물과 헥사데칸을 대표적인 극극성 및 비극성 액체로 사용하여,(i) 이러한 미세 질감이 공기를 포획하여 액체가 유입되는 것을 방지하고(ii) 캐비티의 구획구조가 3개의 공기를 포획하여 액체로 유입되는 것을 방지한다는 것을 입증했습니다. 따라서 이러한 마이크로 텍스처를 "가스-포획 마이크로 텍스처"(GEM)라고 했습니다. 다음 단계로, 우리는 다양한 모양 (원형, 사각형, 육각형) 및 프로파일 (단순, 재진입 및 이중 재진입)으로 GEM을 미세 제작하여 습윤 액체26에침지하에서 자신의 성능을 체계적으로 비교했습니다. 우리는 또한 이중 재진입 프로파일벽으로 둘러싸인 이중 재진입 기둥의 배열로 구성된 하이브리드 마이크로 텍스처를 만들어 액체가 기둥의 줄기를 만지지 못하게하고 침지35에공기를 강력하게 포획하지 못하게했습니다. 아래에서는 설계 파라미터와 함께 포토리소그래피 및 에칭 기술을 통해 SiO2/Si표면에서 GEM제조를 위한 상세한 프로토콜을 제시합니다. 우리는 또한 접촉 각 goniometry (전진 / 후퇴 / 배치 각도로 배치 된 각도)에 의해 자신의 습윤을 특성화하고 헥사데카인과 물에 침지의 대표적인 결과를 제시한다.
프로토콜
참고 : 재진입 및 이중 재진입 구멍 및 기둥의 배열은 Liu와 Kim27에의해보고 된 기둥에 대한 다단계 프로토콜을 적용하여 미세 제작되었습니다. 습윤 전환을 방해할 수 있는 표면의 핀 잔류물 또는 입자의 형성을 최소화하기 위한 예방 조치가 취해졌습니다36.
충치의 미세 가공
광범위하게, 재진입및 이중 재진입충(RC 및 DRC)의 미세제조를 위한 프로토콜은 2차원 레이아웃 설계, 포토리소그래피, 일반 실리카 에칭 및 특정 실리콘 에칭으로 구성되며, 최종 특징에 따라37,38,39,40,41이요구된다.
1. 디자인
- 레이아웃소프트웨어(42)에서필요한 패턴을 설계하여 미세 가공 공정을 시작한다. 이러한 소프트웨어의 예는 재료 목록에나열됩니다.
- 소프트웨어를 사용하여 새 파일을 만듭니다. 직경의 원을 포함하는 단위 셀을 그립니다, D = 200 μm. 복사 및 L = 212 μm의 중심 간 거리 (피치)로이 원을 붙여 영역 1cm2의 사각형 패치에 원의 배열을 작성합니다(그림 2).
- 지름 100mm(4인치)의 원을 그립니다. 1cm2 제곱 배열을 원 안에 배치하고 복제하여 4 x 4 제곱 배열을 만듭니다. 원 내부의 피쳐는 4인치 웨이퍼로 전송됩니다(그림2).
- 디자인 파일을 마스크 쓰기 시스템(예: GDSII 형식)에 원하는 형식으로 내보냅니다.
2. 웨이퍼 청소
- 직경 4인치, 직경 4인치, <100> 배향, 2.4 μm 두께의 열산화물층(재료 목록참조)으로 피라냐 용액에서 10분 동안 피라냐 용액으로 황산(H2 SO4,96%): 과산화수소(H2 O2,30%) 3:1 체적 비율로 T = 388 K로 유지됩니다.
- 탈이온수로 웨이퍼를 헹구고질소(N2)환경에서 스핀 드라이합니다.
3. 포토리소그래피
- 화기상 증착을 사용하여 헥사메틸디실라잔(HMDS)으로 웨이퍼를 코팅하여 포토레지스트로 접착력을 향상시킵니다. 프로세스 세부 정보는 표 1을 참조하십시오.
- 웨이퍼를 스핀 코터의 4인치 진공 척에 장착합니다. AZ-5214E 포토레지스트로 웨이퍼를 덮습니다. 스핀 코터를 사용하여 1.6 μm 두께의 레이어로 표면에 포토 레지던을 균일하게 퍼운다. 스핀 코팅 매개변수는 표 2를 참조하십시오.
- 120s에 대해 110°C에서 유지되는 핫 플레이트상에 포토레지스트 코팅 웨이퍼를 굽습니다.
- 웨이퍼를 직접 쓰기 시스템으로 옮기고 웨이퍼를 55 ms(디포커스: +5)에 대한 UV 방사선에 노출시다. 이 단계는 AZ-5214E에서 원하는 설계를 전송합니다(양수 톤에 사용됨; 재질 목록참조)(그림2).
- UV-노출 웨이퍼를 AZ-726 개발자를 함유하는 유리 페트리 접시에 60s에 배치하여 개발한 기능을 개발한다. 자세한 내용은 재료 목록을 참조하십시오.
- 개발자 용액에서 웨이퍼를 제거하고 탈이온화(DI) 물로 부드럽게 헹구어 과도한 개발자를 제거합니다. N2 환경에서 웨이퍼를 스핀 드라이합니다. 이러한 단계는 그림 3A-C에표시됩니다.
참고: 이 단계가 끝나면 웨이퍼의 설계 패턴을 표준 광학 현미경으로 볼 수 있습니다.
4. 실리카의 이방성 에칭 (SiO2)층
참고: 이 단계의 목표는 포토리소그래피 중에 노출된 실리카 층(2.4 μm 두께)을 완전히 에칭하여 아래 실리콘 층을 노출시키는 것입니다.
- 포토리소그래피 후, 웨이퍼를 옥타플루오로시클로부탄(C4F8)과산소(O2)의 혼합물을 사용하는 유도결합 플라즈마(ICP)반응성 이온 에칭(RIE) 시스템으로 전송하여 실리카를 수직으로 하향(ansotropic etching)한다.
- ICP-RIE 공정을 약 13분 동안 실행하여 노출된 실리카 층을 에칭합니다. 표 3의ICP-RIE 매개 변수를 참조하십시오. 이 단계에서 포토레지스트 레이어도 완전히 에칭됩니다(그림3C-D).
- 실리콘 층이 노출되도록 원하는 패턴 내부의 실리카 층 두께가 0으로 감소되도록하려면 반사계를 사용하여 나머지 실리카의 두께를 측정합니다. 실리카 층의 두께(특히 패턴 안팎)에 따라 후속 에칭 기간의 지속 시간을 조정합니다.
참고: 나머지 실리카층(43)의두께를 측정하기 위해 반사계를 사용하였다. 대안적으로, SiO2 및 두께의 색상을 예측하는 타원또는 인터랙티브 컬러 차트와 같은 다른 도구들도44,45를사용할 수 있다.
1단계와 4단계에 상세히 설명된 절차는 재진입및 이중 재진입 충치 모두에 공통적입니다. 그러나 실리콘 층의 에칭 프로토콜은 다르며 아래에 설명되어 있습니다.
5. 재진입 충치
-
이방성 실리콘 에칭
- 실리카 층을 에칭한 후, 웨이퍼를 깊은 ICP-RIE 시스템으로 옮겨 실리콘을 에칭한다. 첫 번째 단계는 실리콘을 수직으로 아래쪽으로 감쇠시켜 직선 벽을 만드는 보쉬 공정으로 알려진 불소 기반 이방성 에칭 방법으로 구성됩니다.
참고: 보쉬 공정은 반응 챔버에서 C4F8 및 황 헥사플루오라이드(SF6)가스를 사용합니다: C4F8 증착은 패시베이션 층을 생성하고 SF6은 실리콘을 수직으로 아래쪽으로 감쇠시합니다. 따라서 보쉬 공정을 통해 높은 종횡비를 가진 실리콘의 깊은 트렌치를 미세가공할 수 있습니다. - 이 프로세스를 5주기 동안 실행하며, 이는 2 μm에 해당하는 실리콘에 대한 에칭 깊이에 해당하며, 공정 파라미터는 표 4에나열되어 있습니다.
- 피라냐 용액에서 웨이퍼를 10분 간 세척하여 보쉬 공정의 잔재를 제거합니다. 웨이퍼를 DI 물로 헹구고N2 환경에서 스핀 드라이합니다(그림3E).
- 실리카 층을 에칭한 후, 웨이퍼를 깊은 ICP-RIE 시스템으로 옮겨 실리콘을 에칭한다. 첫 번째 단계는 실리콘을 수직으로 아래쪽으로 감쇠시켜 직선 벽을 만드는 보쉬 공정으로 알려진 불소 기반 이방성 에칭 방법으로 구성됩니다.
- 등방성 실리콘 에칭: 재진입 피쳐를 만들려면 실리카 레이어 아래에 언더컷을 만드는 등방성 에칭을 수행합니다. 5 μm 오버행은 SF6을 2분 45초동안 실리콘 층을 에칭함으로써 달성될 수있다(도 3F). 프로세스 매개 변수는 표 5를 참조하십시오.
-
이방성 실리콘 에칭 : 재진입 피쳐가 생성되면 보쉬 프로세스(5.1단계)별로 캐비티의 깊이를 조정합니다.
참고 : hc의 깊이로 구멍을 미세 제작하려면 50 μm, 보쉬 공정의 160 사이클이 필요합니다(그림 3G, 표 4). -
웨이퍼 세척 및 보관
- 2단계에서 설명한 바와 같이 피라냐 용액을 사용하여 웨이퍼를 세척한다. 이 단계 후, 웨이퍼는 물의 접촉 각, θo ° 0 °를 특징으로하는 초과 수성수성이된다.
- 웨이퍼를 유리 페트리 접시에 보관하고 T = 323 K 및 진공 압력 PVac = 3.3 kPa에서 유지되는 깨끗한 진공 오븐 내부에 48 시간 동안 배치한 다음 실리카 층의 본질 접촉 각이 θo °40°로 안정화됩니다.
- 외부 질소가 장착된 깨끗한 캐비닛에 시료를 보관(99%) 흐름을 통해 추가 특성화에 사용할 수 있습니다.
6. 이중 재진입 충치
- 이방성 실리콘 에칭 : 이중 재진입 충치를 만들려면 1단계, 2단계, 3단계, 4및 5.1을 따릅니다(그림 4A-E참조).
-
등방성 실리콘 에칭
이중 재진입 피쳐를 만들려면 재진입 피쳐를 먼저 만들어야 합니다. 이를 달성하기 위해 등방성 에칭을 수행하여 실리카 층 아래에 언더컷을 만듭니다. SF6이 있는 실리콘 층을 25s(그림4F). 프로세스 매개 변수는 표 5를 참조하십시오. 이어서, 2단계에서 기재된 바와 같이 피라냐 용액을 사용하여 웨이퍼를 청소한다. -
열 산화물 성장
- 이중 재진입 기능을 얻으려면 고온 용광로 시스템을 사용하여 웨이퍼상에 500 nm의 열 산화층을 성장시다(그림4G).
- 반사계를 사용하여 산화물 층의 두께를 측정합니다.
참고: 산화는산소(O2)및 수증기로 구성된 환경에 샘플을 노출시킴으로써 수행되었으며, 800-1,200°C의 온도에서 밀폐된 환경에서 실리콘의 습윤 산화를 이끌어 냈다.
- 실리카 에칭: 4단계에서 설명한 것과 동일한 과정을 수행하여 실리카를 수직으로 아래쪽으로 3분 동안 식각한다. 이방성 에칭의 결과로, 열 산화물 (500 nm 두께의 실리카 층)은 공동으로부터 멀리 에칭되지만, 결국 이중 재엔런트 가장자리를 형성할 측벽을 따라 "돌출"을 남깁니다(도 4H, 표 3).
- 이방성 실리콘 에칭 : 보쉬 공정의 5사이클을 반복하여 충치를 2 μm씩 심화시다(도4I, 표 5). 이 단계는 다음 단계에서 이중 재진입 기능 뒤에 있는 실리콘을 제거하는 데 필요합니다. 피라냐 용액을 사용하여 웨이퍼를 청소합니다.
- 등방성 실리콘 에칭: 표 4에기재된 공정 파라미터를 이용하여 실리콘의 등방성 에칭을 2분 및 30초 동안 수행한다. 이 단계는 공동의 입에서 열재배 산화물 뒤에 빈 공간(□2 μm)을 생성하여 이중 재진입 가장자리로 이어집니다(그림4J).
- 이방성 실리콘 에칭 : 보쉬 공정 레시피(단계 5.1)를 160사이클 동안 사용하여 충치의 깊이를 hc°F50 μm로 증가시키고(도4K, 표 5).
- 웨이퍼 세척 및 보관: 상기 5.4단계에 기재된 바와 같이 피라냐 용액을 사용하여 웨이퍼를 세척하고 저장한다.
기둥 S의 미세 가공
재진입 및 이중 재진입 기둥 및 "하이브리드"(벽으로 둘러싸인 이중 재진입 기둥 포함)를 제작하기 위한 설계 프로토콜은 웨이퍼 준비, 실리카 에칭 및 특정 실리콘 에칭의 세 가지 주요 단계로 구성됩니다. 그림 5A-C는 재진입 및 이중 재진입 기둥에 대한 레이아웃 설계의 최상위 뷰를 보여 주며 그림 5D-F는 하이브리드 배열의 레이아웃을 나타냅니다. 동일한 포토레지스트(AZ5214E)를 사용하는 패턴을 제외한 전체 웨이퍼를 노출시키기 위해 UV 노출의 다크 필드 옵션을 선택합니다(그림6A-C 및 도 7A-C). 이러한 특이성 외에도 웨이퍼(2단계)와 에칭 실리카(4단계)를 세척하는 공정은 동일하다.
7. 재진입 기둥
- 이방성 실리콘 에칭 : 전술한 기둥에 대한 특이성을 가진 포토리소그래피, UV 노출, 개발 및 에칭 실리카(1-4단계)를 사용한 후, 보쉬 공정을 이용하여 실리콘 층을 에칭하기 위해 딥 ICP-RIE 시스템으로 웨이퍼를 이송한다. 이 단계는 기둥의 높이를 제어합니다. 보쉬 공정의 160사이클을 사용하여 높이의 기둥을 달성하고, hP □ 30 μm(그림 6E, 표 5). 2단계에서 설명한 대로 웨이퍼를 청소한다.
- 등방성 실리콘 에칭: SF6을 사용하여 5분 동안 등방성 에칭을 수행하여 기둥에 재진입 가장자리를만듭니다(그림 6F, 표 4). 오버행의 결과 길이는 5 μm입니다.
- 피라냐 청소 및 보관: 상기 5.4단계에 기재된 바와 같이 피라냐 용액을 사용하여 웨이퍼를 세척하고 저장한다.
8. 이중 재진입 기둥과 하이브리드
- 이방성 실리콘 에칭 : SiO2를에칭한 후, 웨이퍼를 깊은 ICP-RIE 시스템으로 이송하여 SiO2 층 하에서 Si를 에칭한다. 에칭 깊이에 해당하는 보쉬 공정의 5사이클을 수행한다(도 7E, 표 4). 이어서, 단계 2에 기재된 바와 같이 웨이퍼를 청소한다.
- 등방성 실리콘 에칭: SF6 for 16s를 사용하여 등방성 에칭을 수행하여 재진입 가장자리를 생성합니다(표5, 그림 7F). 2단계에서 설명한 대로 웨이퍼를 청소한다.
- 열 산화물 성장: 단계 6.3(도7G)에기재된 바와 같이 고온 용광로 시스템을 사용하여 웨이퍼 전체에 500 nm층의 열산화물을 성장시켰다.
- 실리카 에칭: 6.4단계(도7H, 표 3)에기재된 바와 같이 3분 동안 열재배 산화물층(500 nm 두께)을 식각한다.
- 이방성 실리콘 에칭 : 보쉬 공정의 160사이클을반복(표 4)기둥의 높이를 증가시다(도7I). 상기 2단계에서 설명한 바와 같이 웨이퍼를 청소한다.
- 등방성 실리콘 에칭: 표 4에기재된 바와 같이 공정 파라미터를 사용하여 실리콘의 등방성 에칭을 5분 동안 수행한다. 이 단계는 이중 재진입 모서리를만듭니다(그림 7J). 기둥 줄기와 이중 재진입 가장자리 사이의 공간은 □2 μm입니다.
- 웨이퍼 세척 및 보관: 상기 5.4단계에 기재된 바와 같이 피라냐 용액을 사용하여 웨이퍼를 세척하고 저장한다.
그림 8은 재진입 및 이중 재진입 구멍 및 기둥을 미세 제작하는 데 사용되는 프로세스 목록을 나타냅니다.
결과
이 섹션에서는 위에서 설명한 프로토콜을 사용하여 재진입 및 이중 재진입 충치(RC 및 DRC, 그림 9)및 재진입 및 이중 재진입 기둥(RPs 및 DRP, 그림 10)을미세 제작합니다. 모든 캐비티에는 직경, DC = 200 μm, 깊이, hC ° 50 μm, 및 인접한 공동 사이의 중심 대 중심 거리 (또는 피치)가 LC = DC + 12 μm입니다. 동일한 제조 프로토콜을 사용하여, 비 원형 모양의 캐비티도 준비 될 수있다, 이전에보고된 대로 26.
기둥 상판에 있는 캡의 직경은 DP=20 μm이었고, 이들의 높이 및 피치는 각각, hp□30 μm 및 LP=100 μm이었다(도10).
가스 를 포획하는 미세 질감(GEM)의 습윤 거동
플랫 실리카 (SiO2)는본질적으로 대부분의 극성 및 비극성 액체를 향해 젖어 있습니다. 예를 들어, 육각형액의 내재접촉각(γLV = 20°C에서 20 mN/m)과 물(표면 장력γ LV = 20°C에서 72.8 mN/m)을 각각 실리카에, 및 θo20° 및 θo°40°C. 그러나, 재진입및 이중 재진입충 충치(DRC) 및 기둥을 미세 가공한 후에, 접촉각은 극적으로 변화하였다(표6). 우리는 0.2 μL/s의 속도로 액체를 분배/후퇴하여 전진/후퇴 접촉 각을 측정하고 두 액체, θr > 120°, (옴니포빅; 그림 11E). 접촉 각을 후퇴, 기둥 기반의 마이크로 텍스처와 같은 마이크로 텍스처의 불연속성의 부족으로 인해 r°0° θ. 한편, 이중 재진입 기둥(DRP)의 배열을 가진 SiO2/Si표면은 액체 및 접촉각 히스테리시스 모두에 대해 명백한 접촉각, θr> 150°를 나타내었다(superomniphobic, 도 11A 및 영화 S1 및 S2). 호기심, 기둥의 배열과 동일한 SiO2/ Si 표면이 즉시 침입있어 동일한 액체에 침지 되었을 때, t < 1 s, 즉 공기가 포획되지 않았다(그림 10A-D,영화 S3). 그래서, 기둥은 접촉 각도의 측면에서 superomniphobic 것으로 나타났지만, 그들은 침수에 공기를 포획하는 데 실패. 실제로 습윤 액체는 미세 질감의 경계(또는 국부적인 결함)에서 침입하여 갇힌 공기를 즉각적으로 대체합니다(그림11A-D 및 Movie S3). 대조적으로, DRC는 두 액체에 침지시 공기를 포획한다(그림11E-H 및 S1, 표 1); 헥사데카인의 경우, 포획된 공기는 1개월26개월후에도 그대로 유지되었습니다. 우리의 공초점 현미경 실험은 돌출 된 특징이 침입 하는 액체를 안정화 하 고 그 안에 공기를 함정(그림 12A-B).
다음으로, Drps의 배열에 공기를 포획하기 위해, 우리는 이중 재진입 프로파일의 벽으로 둘러싸인 기둥의 배열을 달성하기 위해 동일한 미세 가공 프로토콜을 사용했습니다(그림 10G-I). 이 전략은 습윤 액체에서 DrPs의 줄기를 절연. 그 결과, 하이브리드 마이크로텍스처는 공초점 현미경(도12C-D)및 영화 S4, 표 6에의해 확인된 바와 같이 GEM으로서 행동하였다. 따라서 하이브리드 마이크로 텍스처가 있는 실리카 표면은 공기를 트래핑하여 침수에 전능성을 나타내고 접촉 각도, θr> 120°, (옴니포빅) 및 접촉각 및 침지 에 공기를 포획하는 측면에서 옴니포빅을 입증했습니다. 표 6에서,우리는 접촉 각도와 침수에 의해 다양한 마이크로 텍스처 캐비티 기반, 기둥 기반 및 하이브리드SiO2/Si 표면의 전지성을 평가합니다.
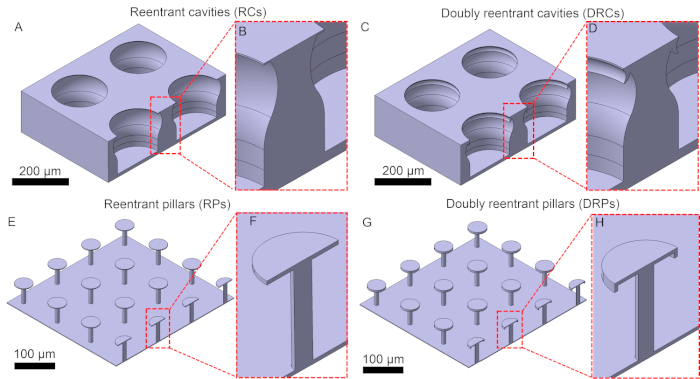
그림 1: 미세 구조의 회로도. (A–B) 재진입 충치,(C–D)이중 재진입 충치,(E–F)재진입 기둥,(G–H)이중 재진입 기둥. 이 그림의 더 큰 버전을 보려면 여기를 클릭하십시오.
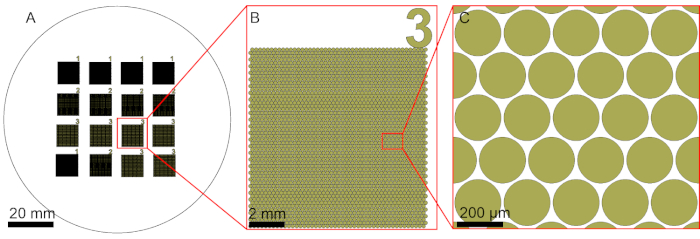
그림 2: 캐비티에 대한 패턴 디자인. 레이아웃 소프트웨어를 사용하여 생성된 재진입 및 이중 재진입 캐비티에 대한 디자인 패턴입니다. 패턴은 포토리소그래피를 사용하여 웨이퍼 상에 전달되었다. 이 그림의 더 큰 버전을 보려면 여기를 클릭하십시오.

그림 3: 재진입충을 위한 미세 가공 프로토콜. (A)실리콘 웨이퍼를 2.4 μm 두께의 실리카를 위에 두는 깨끗한 실리콘 웨이퍼. (B)웨이퍼를 포토레지스트로 스핀 코팅하고 UV 광에 노출시다. (C)UV 노출 포토레지스트를 개발하여 디자인 패턴을 얻습니다. (D)노출된 상부 실리카층의 에칭을 수직으로 하향(anisotropic 에칭)을 유도결합혈장(ICP)을 사용하여 반응성 이온 에칭(RIE)한다. (E)깊은 ICP-RIE를 사용하여 노출 된 실리콘 층의 얕은 이방성 에칭. (F)실리콘의 등방성 에칭을 통해 재진입 가장자리를 만듭니다. (G)깊은 이방성 실리콘 에칭은 충치의 깊이를 증가시다. 이 그림의 더 큰 버전을 보려면 여기를 클릭하십시오.
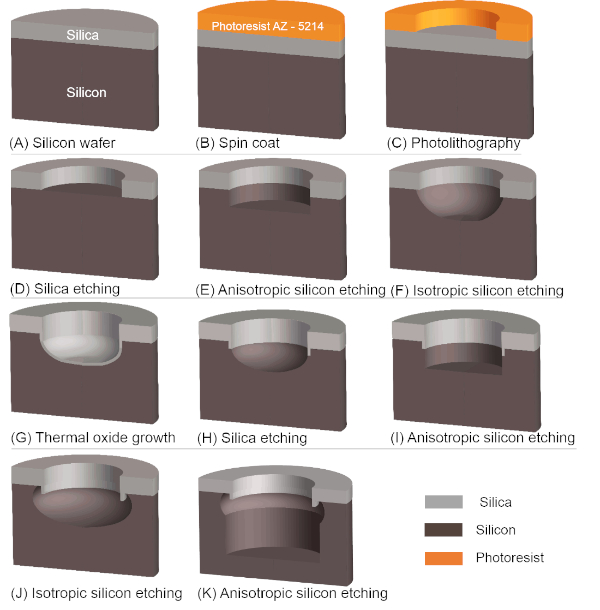
그림 4: 이중 재진입충 충치에 대한 미세 가공 프로토콜. (A)실리콘 웨이퍼를 2.4 μm 두께의 실리카를 위에 두는 깨끗한 실리콘 웨이퍼. (B)웨이퍼를 포토레지스트로 스핀 코팅하고 UV 광에 노출시다. (C)UV 노출 포토레지스트를 개발하여 디자인 패턴을 얻습니다. (D)노출된 상부 실리카층의 에칭을 수직으로 하향(anisotropic 에칭)을 유도결합혈장(ICP)을 사용하여 반응성 이온 에칭(RIE)한다. (E)깊은 ICP-RIE를 사용하여 노출 된 실리콘 층의 얕은 이방성 에칭. (F)깊은 ICP-RIE를 사용하여 언더컷을 만드는 실리콘의 얕은 등방성 에칭. (G)열 산화물 성장. (H)상하 실리카 층의 이방성 에칭. (I)실리콘의 얕은 이방성 에칭. (J)등방성 실리콘 에칭을 이중 재진입 가장자리를 만듭니다. (K)깊은 이방성 실리콘 에칭은 충치의 깊이를 증가시다. 이 그림의 더 큰 버전을 보려면 여기를 클릭하십시오.

그림 5: 기둥에 대한 디자인 패턴입니다. 레이아웃 소프트웨어를 사용하여 생성된 재진입, 이중 재진입 및 하이브리드 기둥에 대한 디자인 패턴입니다. 패턴은 포토리소그래피를 사용하여 웨이퍼 상에 전달되었다. 이 그림의 더 큰 버전을 보려면 여기를 클릭하십시오.
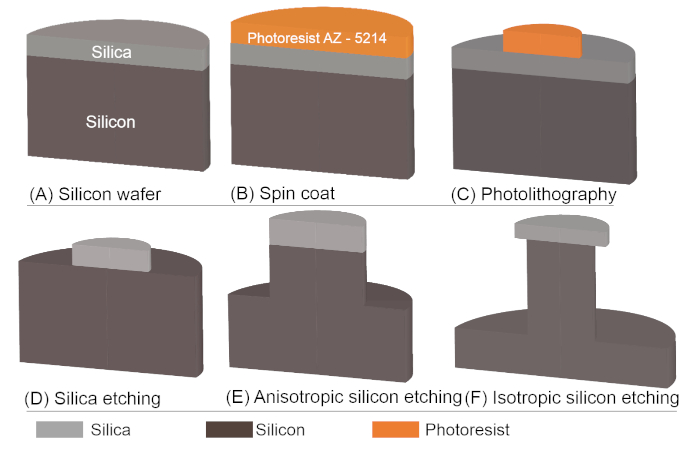
그림 6: 재진입 기둥의 미세 가공 프로토콜. (A)실리콘 웨이퍼를 2.4 μm 두께의 실리카를 위에 두는 깨끗한 실리콘 웨이퍼. (B)웨이퍼를 포토레지스트로 스핀 코팅하고 UV 광에 노출시다. (C)UV 노출 포토레지스트를 개발하여 디자인 패턴을 얻습니다. (D)노출된 상부 실리카층의 에칭을 수직으로 하향(anisotropic 에칭)을 유도결합혈장(ICP)을 사용하여 반응성 이온 에칭(RIE)한다. (E)깊은 이방성 실리콘 에칭은 기둥의 높이를 증가시다. (F)등방성 실리콘 에칭을 통해 재진입 가장자리를 생성합니다. 이 그림의 더 큰 버전을 보려면 여기를 클릭하십시오.
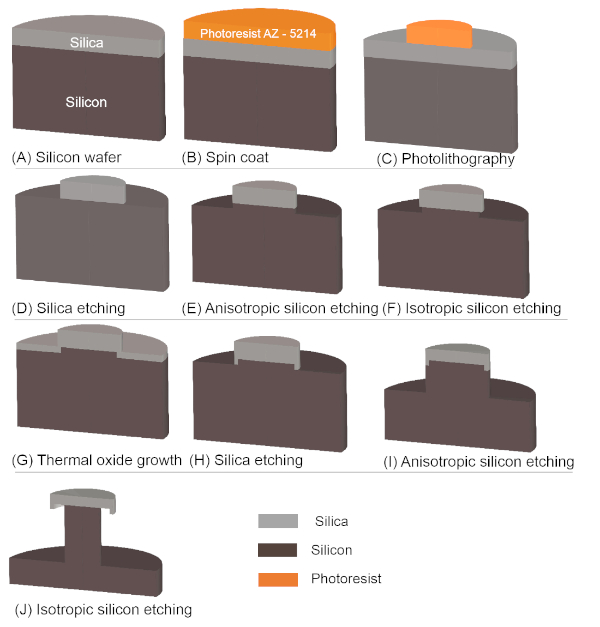
그림 7: 이중 재진입 기둥을 위한 미세 가공 프로토콜. (A)실리콘 웨이퍼를 2.4 μm 두께의 실리카를 위에 두는 깨끗한 실리콘 웨이퍼. (B)웨이퍼를 포토레지스트로 스핀 코팅하고 UV 광에 노출시다. (C)UV 노출 포토레지스트를 개발하여 디자인 패턴을 얻습니다. (D)노출된 상부 실리카층의 에칭을 수직으로 하향(anisotropic 에칭)을 유도결합혈장(ICP)을 사용하여 반응성 이온 에칭(RIE)한다. (E)깊은 ICP-RIE를 사용하여 노출 된 실리콘 층의 얕은 이방성 에칭. (F)깊은 ICP-RIE를 사용하여 언더컷을 만드는 실리콘의 얕은 등방성 에칭. (G)열 산화물 성장. (H)실리카 층의 상하의 이방성 에칭. (I)기둥의 높이를 높이기 위해 이방성 실리콘 에칭. (J)등방성 실리콘 에칭은 이중 재진입 가장자리를 생성합니다. 이중 재진입 기둥과 "하이브리드"의 유일한 차이점은 처음에 디자인입니다. 이 그림의 더 큰 버전을 보려면 여기를 클릭하십시오.

그림 8: 재진입 및 이중 재진입 구멍 및 기둥을 위한 미세 가공 프로토콜. 순서도에는 관련된 주요 단계가 나열되어 있습니다. 이 그림의 더 큰 버전을 보려면 여기를 클릭하십시오.
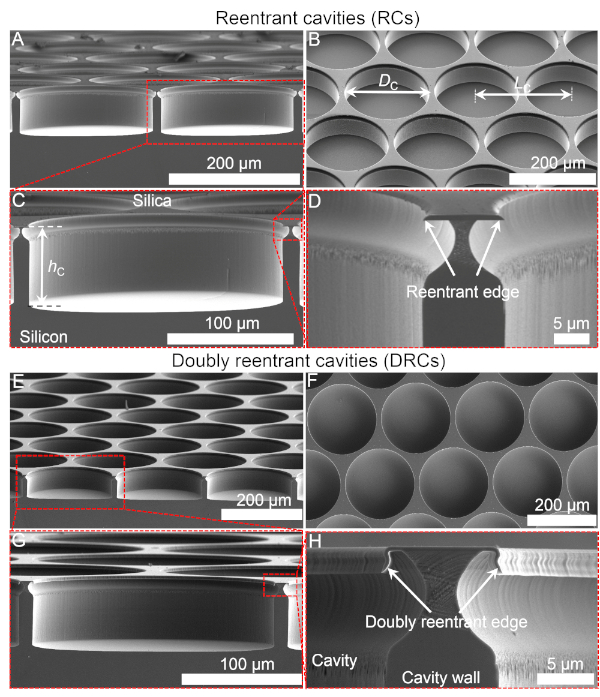
그림 9: 재진입및 이중 재진입충의 전자 현미경 을 스캔합니다. (A-D) 재진입 충치 배열이 있는 실리카 표면의 단면 및 등각 투영 뷰입니다. (E-H) 이중 재진입 충치의 단면 및 상단 뷰. DC = 캐비티 및 LC의 직경 = 인접 캐비티(또는 피치) 사이의 중심 대 중심 거리 및 hC = 캐비티 깊이. 이 그림의 더 큰 버전을 보려면 여기를 클릭하십시오.
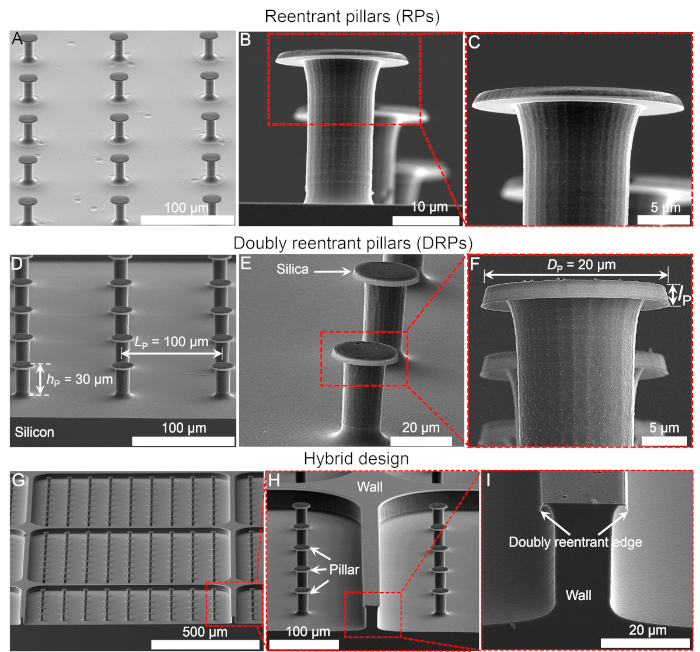
그림 10: 재진입 및 이중 재진입 기둥의 전자 현미경 현미경 스캔. (A-C) 재진입 기둥의 등각 투영 뷰입니다. (D-F) 이중 재진입 기둥. (G-I) 하이브리드 기둥 - 이중 재진입 벽으로 둘러싸인 DRP. DP - 기둥 캡과 LP의 직경 - 인접한 기둥 (또는 피치) 사이의 중심 대 중심 거리 및 hP – 기둥의 높이. 그림 D–I, Ref.35, 저작권 (2019)에서 엘스비어의 허가를 받아 재인쇄되었습니다. 이 그림의 더 큰 버전을 보려면 여기를 클릭하십시오.

그림 11: 습윤 동작. (A)SiO 2/Si표면의 초고음공포증어배열로 장식된 이중 재진입기둥으로, 위에 액체 방울을 놓음으로써 관찰하였다. (B-D) 습윤 액체가 경계 또는 국부적 결함에 닿으면 초음속 공포증이 즉시 손실됩니다. (E)SiO2/Si표면배열이중재응축으로 장식된 표면은 전지성을 나타낸다. (F-H) 이러한 미세 질감은 공기를 견고하게 포획하며 액체가 경계 또는 국부적 결함에 닿으면 공기를 잃지 않습니다. Ref.35, 저작권 (2019)에서 전재, 엘스비어의 허가와 함께. 이 그림의 더 큰 버전을 보려면 여기를 클릭하십시오.

그림 12: 액체에 침지된 마이크로 텍스처의 공초점 현미경 검사법. 컴퓨터로 강화된 대표적인 공초점 이미지(점선을 따라 등각투영 및 단면)의 이중 재엔런트 캐비티와 하이브리드 기둥이 z °5 mm 열 아래에 침지된 실리카 표면의 습윤전환(A,C)물 및(B,D)헥사데칸의 5분 후 의 컴퓨터 로 강화된 3D 재구성. (거짓) 파란색과 노란색 색상은 갇힌 공기와 물과 헥사데케인의 인터페이스에 해당합니다. 액체 반월 상 연골 침입은 이중 재진입 가장자리에서 안정화되었다. (스케일 바 = 공동의 직경과 기둥은 각각 200 μm 및 20 μm). 그림 12는 엘스비어의 허가를 받아 Ref.35, 저작권(2019)에서 전재되었습니다. 이 그림의 더 큰 버전을 보려면 여기를 클릭하십시오.
| 1 단계 : 챔버에서 탈수 및 정화 산소 | ||
| 단계 | 프로세스 시퀀스 | 시간(최소) |
| 1 | 진공 (10 토르) | 1 |
| 2 | 질소 (760 토르) | 3 |
| 3 | 진공 (10 토르) | 1 |
| 4 | 질소 (760 토르) | 3 |
| 5 | 진공 (10 토르) | 1 |
| 6 | 질소 (760 토르) | 3 |
| 2단계: 프라이밍 | ||
| 프로세스 시퀀스 | 시간(최소) | |
| 7 | 진공 (토르 1개) | 2 |
| 8 | HMDS (6 토르) | 5 |
| 3단계: 프라임 배기 제거 | ||
| 프로세스 시퀀스 | 시간(최소) | |
| 9 | 진공 | 1 |
| 10 | 질소 | 2 |
| 11 | 진공 | 2 |
| 4단계: 대기로 돌아가기(백필) | ||
| 프로세스 시퀀스 | 시간(최소) | |
| 12 | 질소 | 3 |
표 1: 실리카 표면과 AZ-5214E 포토레지스트 사이의 접착력을 향상시키기 위해 hexamethyldisilazane(HMDS) 층을 코팅하기 위한 공정 세부 사항.
| 단계 | 속도 (rpm) | 경사로(rpm/s) | 시간 (들) |
| 1 | 800 | 1000 | 3 |
| 2 | 1500 | 1500 | 3 |
| 3 | 3000 | 3000 | 30 |
표 2: 스핀 코팅을 통해 SiO 2/Si 웨이퍼에 1.6μm 두께의 AZ-5214E 포토레지스트 레이어를 달성하기 위한 공정 세부 사항.
| RF 전원, (W) | ICP 전원, (W) | 에칭 압력, (mTorr) | C4F8 흐름(sccm) | O2 흐름(sccm) | 온도, (°C) |
| 100 | 1500 | 10 | 40 | 5 | 10 |
표 3: 유도결합 플라즈마에 사용되는 실리카 에칭에 대한 파라미터 설정 – 반응성 이온 에칭 (ICP-RIE).
| RF 전원, (W) | ICP 전원, (W) | 에칭 압력, (mTorr) | SF6 흐름, (sccm) | 온도, (°C) |
| 20 | 1800 | 35 | 110 | 15 |
표 4: 유도결합 플라즈마에 사용되는 실리콘 에칭(등방성)에 대한 파라미터 설정 – 깊은 반응성 이온 에칭(ICP-DRIE).
| 단계 | RF 전원, (W) | ICP 전원, (W) | 에칭 압력, (mTorr) | SF6 흐름, (sccm) | C4F8 흐름, (sccm) | 온도, (°C) | 증착/에칭 시간, (들) |
| 패시베이션 레이어 | 5 | 1300 | 30 | 5 | 100 | 15 | 5 |
| 에칭 | 30 | 1300 | 30 | 100 | 5 | 15 | 7 |
표 5: 유도결합 플라즈마에 사용되는 실리콘 에칭(anisotropic)에 대한 파라미터 설정 – 깊은 반응성 이온 에칭(ICP-DRIE).
| 표면 | 기준: 공기 중의 접촉 각도 | 기준: 몰입 | |||
| 물 | 헥사데카인 | 물 | 헥사데카인 | ||
| 드립 (것)중의원 | θr | 153°±1° | 153° ± 1° | 순간 관통 | 순간 관통 |
| θA | 161°±2° | 159° ± 1° | |||
| θR | 139°±1° | 132° ± 1° | |||
| 평가: | 수퍼옴닉 포빅 | 아니 전지성 – 사실, 전지전능 | |||
| 드록 (것)들은 | θr | 124° ± 2° | 115° ± 3° | 갇힌 공기 (전지성) | 갇힌 공기 (전지성) |
| θA | 139° ± 3° | 134° ± 5° | |||
| θR | 0° | 0° | |||
| 평가: | 전니포빅 | 전니포빅 | |||
| 하이브리드 | θr | 153°± 2° | 153° ± 2° | 갇힌 공기 (전지성) | 갇힌 공기 (전지성) |
| θA | 161°± 2° | 159° ± 2° | |||
| θR | 0° | 0° | |||
| 평가: | 전니포빅 | 전니포빅 | |||
표 6: 접촉각 측정 –전진(θA),후퇴(θR),및 뚜렷한(θr)– 액체에 침지. 이 표는 엘스비어의 허가를 받아 Ref.35, 저작권 (2019)에서 전재되었습니다.
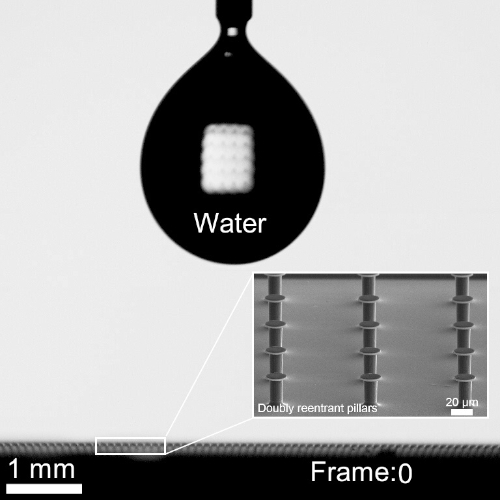
동영상 S1: 이중 재진입 기둥으로 구성된 미세 질감 표면에서 물방울이 튀어나오는 고속 이미지 시퀀스(15K fps)입니다. 이 영화는 ref 35에서 복각되었습니다. 저작권 (2019), 엘스비어의 허가. 이 비디오를 보려면 여기를 클릭하십시오 (다운로드 오른쪽 버튼을 클릭하십시오).
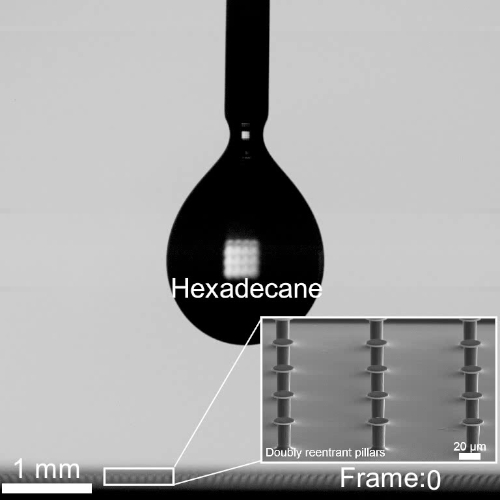
동영상 S2: 이중 재진입 기둥으로 구성된 미세 질감 표면에서 튀어나오는 헥사데카인 방울의 고속 이미지 시퀀스(19K fps). 이 영화는 ref 35에서 복각되었습니다. 저작권 (2019), 엘스비어의 허가. 이 비디오를 보려면 여기를 클릭하십시오 (다운로드 오른쪽 버튼을 클릭하십시오).
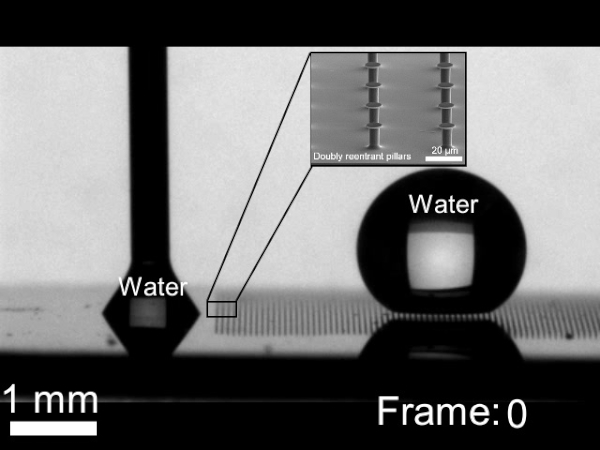
동영상 S3: 이중 재진입 기둥으로 구성된 마이크로 텍스처로 물 침지의 이미지 시퀀스(200fps). 이 영화는 ref 35에서 복각되었습니다. 저작권 (2019), 엘스비어의 허가. 이 비디오를 보려면 여기를 클릭하십시오 (다운로드 오른쪽 버튼을 클릭하십시오).
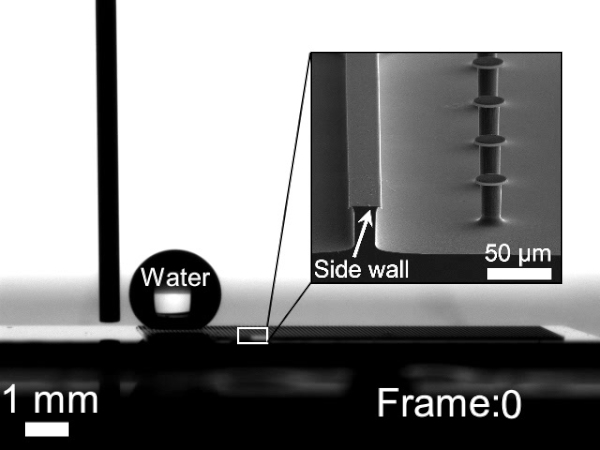
동영상 S4: 이미지 시퀀스(200fps) 물방울이 하이브리드 마이크로 텍스처 옆에 있습니다. 이중 재진입 경계 벽의 존재는 미세 질감에 액체 침입을 방지, 이는 또한 침지 에서 표면 전능한하게. 이 영화는 ref 35에서 복각되었습니다. 저작권 (2019), 엘스비어의 허가. 이 비디오를 보려면 여기를 클릭하십시오 (다운로드 오른쪽 버튼을 클릭하십시오).
토론
여기서는 독자가 이러한 미세 제작 프로토콜을 적용하는 데 도움이 되는 추가 요인및 설계 기준에 대해 설명합니다. 캐비티 마이크로 텍스처(RC 및 DRC)의 경우 피치 선택이 매우 중요합니다. 인접한 공동 사이의 얇은 벽은 낮은 액체 고체 계면 영역과 높은 액체 증기 계면 영역으로 이어질 것이며, 높은 명백한 접촉 각(34)으로이어질 수 있습니다. 그러나 얇은 벽은 처리 및 특성화 중에 미세 질감의 기계적 무결성을 손상시킬 수 있습니다. 얇은 벽 (예를 들어, 6.6 단계)으로 약간 지나치게 에칭하면 전체 마이크로 텍스처가 파괴 될 수 있습니다. 얇은 벽으로 에칭이 부족하면 이중 재진입 기능의 개발을 방지 할 수 있습니다. DRC 기능이 완전히 개발되지 않은 경우, 특히 액체가 충치26내부에 응축되는 경우 장기간 공기를 포획하는 능력이 저하될 수 있습니다. 이러한 이유로, 우리는 실험에서 피치를 L = D + 12 μm(즉, 캐비티 사이의 최소 벽 두께는 12 μm)로 선택했습니다. 우리는 또한 L = D + 5 μm의 작은 피치로 이중 재진입 충치를 제조했지만, 그 결과 표면은 미세 가공 중 구조적 손상으로 인해 균일하지 않았습니다.
4단계에서C4F8 및O2를 가진 실리카 층의 에칭 동안, 반응 챔버의 이전 사용 내역 또는 청결도는 대부분의 대학과 같은 일반적인 사용자 시설에서 동일한 단계를 따르음에도 불구하고 가변적인 결과를 제공할 수 있었다. 따라서, 이 단계는 짧은 시간, 예를 들어, 각각 5분 이하의 짧은 기간에 수행되고 반사측정법과 같은 독립적인 기술에 의해 실리카 층의 두께를 모니터링하는 것이 좋습니다. 2.4 μm 두께의 실리카 층을 가진 웨이퍼의 경우, 전형적인 에칭 루틴은 표적 부위에서 실리카를 완전히 제거하는 데 13분이 걸렸습니다(표3). 이 과정에서 포토레지스트도 에칭되었기 때문에, 이 단계는 포토레지스트에 의해 처음 마스크된 실리카 층의 1 μm를 제거하였다. 또한, 에칭 속도가 예상대로였는지 확인하고, 이전 식각 공정(다중 사용자 시설에서 일반적인 문제)에서 교차 오염을 방지하기 위해 실리카 에칭은 항상 희생 웨이퍼를 예방 단계로 에칭하는 것이었습니다. 포토레지스트를 개발하는 동안 노출된 표면은 포토레지스트의 흔적/입자로 오염되어 핀 잔류물의 형성으로 이어지는 (현미경) 마스크로 작용할 수 있습니다. 이를 방지하기 위해, 엄격한 세척 및 저장 프로토콜은 미세 제조 공정(36)에걸쳐 따라야한다.
마찬가지로, 보쉬 공정 중, SiO2 레이어는 아래 Si 레이어에 대한 마스크 역할을 하더라도, 느린 속도로 긴 에칭 사이클 동안 에칭됩니다. 따라서, 캐비티의 깊이 또는 기둥의 높이는 재진입 특징이 손상되지 않을 지점까지 제한된다. 보쉬 공정 중 패시베이션과 에칭 시간은 매끄러운 벽을 확보하기 위해 조정되어야 한다. 이것은 반복적으로 조리법을 시험하고 전자 현미경 검사법을 사용하여, 예를 들면 견본에 그들의 효력을 관찰하임으로써 달성될 수 있습니다.
LP와 DRPs의 경우, 등방성 에칭의 기간이 길수록 줄기의 직경이 작아질 수 있습니다. 직경이 10 μm 미만이면 기계적 취약성으로 이어질 수 있습니다. 이러한 제한은 미세 가공 절차의 시작 부분에 설계를 알려야 합니다.
대학에서 일반적으로 사용할 수있는 드라이 에칭 도구는 산업 등급 의 허용 오차가 없는, 챔버 내부에 에칭의 속도 측면에서 공간 비 균일로 이어지는. 따라서 웨이퍼의 중심에서 얻은 피쳐는 경계에 있는 피처와 동일하지 않을 수 있습니다. 이러한 한계를 극복하기 위해 4인치 웨이퍼를 사용하고 중부 지역에만 집중했습니다.
또한 포토리소그래그래피에 하드 컨택트 마스크를 사용하는 대신 직접 쓰기 시스템을 사용하는 것이 좋습니다.
물론 SiO2/Si웨이퍼나 포토리소그래피는 전지성 표면의 대량 생산을 위한 원하는 재료 또는 공정이 아닙니다. 그러나, 그들은 예를 들어,생물 모방26,27,34,35,46,47,응용 프로그램에 대한 저비용 및 확장 가능한 재료 시스템으로 변환 할 수있는, 전능한 표면을 엔지니어링에 대한 혁신적인 마이크로 텍스처를 탐구하는 우수한 모델 시스템 역할을합니다. 가까운 장래에 3D 프린팅48,적층 제조49,레이저 마이크로머시닝50등의 기술을 사용하여 GEM의 설계 원칙이 확장될 것으로 예상됩니다. 마이크로 텍스처 SiO2/Si 표면은 부드러운 재료29,51을템플릿하는 데 사용할 수도 있습니다. 현재, 우리는 캐비테이션 손상47,담수화46,52및 유체 역학 적 항력을 감소시키기위한 가스 포획 표면의 응용 프로그램을 조사하고 있습니다.
공개
저자는 경쟁적인 이해관계가 없다고 선언합니다.
감사의 말
HM은 킹 압둘라 과학 기술 대학 (KAUST)의 자금 지원을 인정합니다.
자료
| Name | Company | Catalog Number | Comments |
| AZ-5214 E photoresist | Merck | DEAA070796-0W59 | Photoresist, flammable liquid |
| AZ-726 MIF developer | Merck | 10055824960 | To develop photoresist |
| Confocal microscopy | Zeiss | Zeiss LSM710 | Upright confocal microscope to visualize liquid meniscus shape |
| Deep ICP-RIE | Oxford Instruments | Plasmalab system100 | Silicon etching tool |
| Direct writer | Heidelberg Instruments | µPG501 | Direct-writing system |
| Drop shape analyzer | KRUSS | DSA100 | To measure contact angle |
| Hexadecane | Alfa Aesar | 544-76-3 | Test liquid |
| Highspeed imaging camera | Phantom vision research | v1212 | To image droplet bouncing |
| HMDS vapor prime | Yield Engineering systems | ||
| Hot plate | Cost effective equipments | Model 1300 | |
| Hydrogen peroxide 30% | Sigma Aldrich | 7722-84-1 | To prepare piranha solution |
| Imaris software | Bitplane | Version 8 | Post process confocal microscopy images |
| Nile Red | Sigma Aldrich | 7385-67-3 | Fluorescent dye for hexadecane |
| Nitrogen gas | KAUST lab supply | To dry the wafer | |
| Petri dish | VWR | HECH41042036 | |
| Reactive-Ion Etching (RIE) | Oxford Instruments | Plasmalab system100 | Silica etching tool |
| Reflectometer | Nanometrics | Nanospec 6100 | To check remaining oxide layer thickness |
| Rhodamine B (Acros) | Fisher scientific | 81-88-9 | Fluorescent dye for water |
| SEM stub | Electron Microscopy Sciences | 75923-19 | |
| SEM-Quanta 3D | FEI | Quanta 3D FEG Dual Beam | |
| Silicon wafer | Silicon Valley Microelectronics | Single side polished, 4" diameter, 500 µm thickness, 2.4 µm thick oxide layer | |
| Spin coater | Headway Research,Inc | PWM32 | |
| Spin rinse dryer | MicroProcess technology | Avenger Ultra -Pure 6 | Dry the wafers after piranha clean |
| Sulfuric acid 96% | Technic | 764-93-9 | To prepare piranha solution |
| Tanner EDA L-Edit software | Tanner EDA, Inc. | version15 | Layout design |
| Thermal oxide growth | Tystar furnace | To grow thermal oxide in patterned silicon wafer | |
| Tweezers | Excelta | 490-SA-PI | Wafer tweezer |
| Vacuum oven | Thermo Scientific | 13-258-13 | |
| Water | Milli-Q | Advantage A10 | Test liquid |
참고문헌
- Butt, H. J., et al. Characterization of super liquid-repellent surfaces. Current Opinion in Colloid & Interface Science. 19 (4), 343-345 (2014).
- Lee, J., Laoui, T., Karnik, R. Nanofluidic transport governed by the liquid/vapour interface. Nature Nanotechnology. 9 (4), 317-323 (2014).
- Subramanian, N., et al. Evaluating the potential of superhydrophobic nanoporous alumina membranes for direct contact membrane distillation. Journal of Colloid and Interface Science. 533, 723-732 (2019).
- Xue, Z. X., Cao, Y. Z., Liu, N., Feng, L., Jiang, L. Special wettable materials for oil/water separation. Journal of Materials Chemistry A. 2 (8), 2445-2460 (2014).
- Zhang, L. B., Zhong, Y. J., Cha, D., Wang, P. A self-cleaning underwater superoleophobic mesh for oil-water separation. Scientific Reports. 3, (2013).
- Leslie, D. C., et al. A bioinspired omniphobic surface coating on medical devices prevents thrombosis and biofouling. Nature Biotechnology. 32 (11), 1134-1140 (2014).
- Lee, C., Choi, C. H., Kim, C. J. Superhydrophobic drag reduction in laminar flows: a critical review. Experiments in Fluids. 57 (176), (2016).
- Tuteja, A., Choi, W., Mabry, J. M., McKinley, G. H., Cohen, R. E. Robust omniphobic surfaces. Proceedings of the National Academy of Sciences of the United States of America. 105 (47), 18200-18205 (2008).
- Brown, P. S., Bhushan, B. Mechanically durable, superoleophobic coatings prepared by layer-by-layer technique for anti-smudge and oil-water separation. Scientific Reports. 5, (2015).
- Wong, T. S., et al. Bioinspired self-repairing slippery surfaces with pressure-stable omniphobicity. Nature. 477 (7365), 443-447 (2011).
- Milionis, A., Dang, K., Prato, M., Loth, E., Bayer, I. Liquid repellent nanocomposites obtained from one-step water-based spray. Journal of Materials Chemistry A. 3 (24), 12880-12889 (2015).
- Mishra, H., et al. Time-Dependent Wetting Behavior of PDMS Surfaces with Bioinspired, Hierarchical Structures. ACS Applied Materials & Interfaces. 8 (12), 8168-8174 (2016).
- Hendren, Z. D., Brant, J., Wiesner, M. R. Surface modification of nanostructured ceramic membranes for direct contact membrane distillation. Journal of Membrane Science. 331 (12), 1-10 (2009).
- Rezaei, M., et al. Wetting phenomena in membrane distillation: Mechanisms, reversal, and prevention. Water Research. 139, 329-352 (2018).
- Verho, T., et al. Mechanically Durable Superhydrophobic Surfaces. Advanced Materials. 23, 673-678 (2011).
- Boinovich, L., Emelyanenko, A. M., Pashinin, A. S. Analysis of Long-Term Durability of Superhydrophobic Properties under Continuous Contact with Water. ACS Applied Materials & Interfaces. 2 (6), 1754-1758 (2010).
- Herminghaus, S. Roughness-induced non-wetting. Europhysics Letters. 52 (2), 165-170 (2000).
- Abdelsalam, M. E., Bartlett, P. N., Kelf, T., Baumberg, J. Wetting of regularly structured gold surfaces. Langmuir. 21 (5), 1753-1757 (2005).
- Liu, J. L., Feng, X. Q., Wang, G. F., Yu, S. W. Mechanisms of superhydrophobicity on hydrophilic substrates. Journal of Physics-Condensed Matter. 19 (35), (2007).
- Nosonovsky, M. Multiscale roughness and stability of superhydrophobic biomimetic interfaces. Langmuir. 23 (6), 3157-3161 (2007).
- Marmur, A. From hygrophilic to superhygrophobic: Theoretical conditions for making high-contact-angle surfaces from low-contact-angle materials. Langmuir. 24 (14), 7573-7579 (2008).
- Hensel, R., et al. Wetting Resistance at Its Topographical Limit: The Benefit of Mushroom and Serif T Structures. Langmuir. 29 (4), 1100-1112 (2013).
- Bormashenko, E. Progress in understanding wetting transitions on rough surfaces. Advances in Colloid and Interface Science. 222, 92-103 (2015).
- Patankar, N. A. Thermodynamics of trapping gases for underwater superhydrophobicity. Langmuir. 32 (27), 7023-7028 (2016).
- Kaufman, Y., et al. Simple-to-Apply Wetting Model to Predict Thermodynamically Stable and Metastable Contact Angles on Textured/Rough/Patterned Surfaces. The Journal of Physical Chemistry C. 121 (10), 5642-5656 (2017).
- Domingues, E. M., Arunachalam, S., Nauruzbayeva, J., Mishra, H. Biomimetic coating-free surfaces for long-term entrapment of air under wetting liquids. Nature Communications. 9 (1), 3606(2018).
- Liu, T. Y., Kim, C. J. Turning a surface superrepellent even to completely wetting liquids. Science. 346 (6213), 1096-1100 (2014).
- Hensel, R., Neinhuis, C., Werner, C. The springtail cuticle as a blueprint for omniphobic surfaces. Chemical Society Reviews. 45 (2), 323-341 (2016).
- Hensel, R., et al. Biologically Inspired Omniphobic Surfaces by Reverse Imprint Lithography. Advanced Materials. 26 (13), 2029-2033 (2014).
- Hensel, R., et al. Tunable nano-replication to explore the omniphobic characteristics of springtail skin. Npg Asia Materials. 5, (2013).
- Helbig, R., Nickerl, J., Neinhuis, C., Werner, C. Smart Skin Patterns Protect Springtails. PLOS ONE. 6 (9), 25105(2011).
- Cheng, L. Marine and Freshwater Skaters: Differences in Surface Fine Structures. Nature. 242, 132(1973).
- Andersen, N. M., Cheng, L. The marine insect Halobates (Heteroptera: Gerridae): biology, adaptations, distribution, and phylogeny. Oceanography and marine biology: an annual review. 42, 119-180 (2004).
- Domingues, E. M., Arunachalam, S., Mishra, H. Doubly Reentrant Cavities Prevent Catastrophic Wetting Transitions on Intrinsically Wetting Surfaces. ACS Applied Materials & Interfaces. 9 (25), 21532-21538 (2017).
- Arunachalam, S., Das, R., Nauruzbayeva, J., Domingues, E. M., Mishra, H. Assessing omniphobicity by immersion. Journal of Colloid and Interface Science. 534, 156-162 (2019).
- Christian Koch, E. A. Photolithography: Basics of Microstructuring. , MicroChemicals GmbH. (2017).
- Jansen, H., de Boer, M., Legtenberg, R., Elwenspoek, M. The black silicon method: a universal method for determining the parameter setting of a fluorine-based reactive ion etcher in deep silicon trench etching with profile control. Journal of Micromechanics and Microengineering. 5 (2), 115(1995).
- Jansen, H. V., de Boer, M. J., Unnikrishnan, S., Louwerse, M., Elwenspoek, M. C. Black silicon method X: a review on high speed and selective plasma etching of silicon with profile control: an in-depth comparison between Bosch and cryostat DRIE processes as a roadmap to next generation equipment. Journal of Micromechanics and Microengineering. 19 (3), 033001(2009).
- Xiu, Y., Zhu, L., Hess, D. W., Wong, C. Hierarchical silicon etched structures for controlled hydrophobicity/superhydrophobicity. Nano Letters. 7 (11), 3388-3393 (2007).
- Azeredo, B., et al. Silicon nanowires with controlled sidewall profile and roughness fabricated by thin-film dewetting and metal-assisted chemical etching. Nanotechnology. 24 (22), 225305(2013).
- Coffinier, Y., et al. Preparation of superhydrophobic silicon oxide nanowire surfaces. Langmuir. 23 (4), 1608-1611 (2007).
- Tanner, E. L-Edit-The layout editor. Reference Manual. , Available from: https://usermanual.wiki/Document/LEdit20Manual.38314693/view (2009).
- NANOSPEC 6100 Series Operators Users Manual. , Nanometrics. Available from: https://cmi.epfl.ch/metrology/Nanospec_AFT6100_Manual.pdf (2019).
- Deal, B. E., Grove, A. General relationship for the thermal oxidation of silicon. Journal of Applied Physics. 36 (12), 3770-3778 (1965).
- Woollam, J. A., et al. Spectroscopic ellipsometry from the vacuum ultraviolet to the far infrared. AIP Conference Proceedings. 550 (1), 511-518 (2001).
- Das, R., Arunachalam, S., Ahmad, Z., Manalastas, E., Mishra, H. Bio-inspired gas-entrapping membranes (GEMs) derived from common water-wet materials for green desalination. Journal of Membrane Science. , 117185(2019).
- Gonzalez-Avila, S. R., Nguyen, D. M., Arunachalam, S., Domingues, E. M., Mishra, H., Ohl, C. D. Mitigating cavitation erosion using biomimetic gas-entrapping microtextured surfaces. Science Advances. , In-press (2020).
- Liu, X., et al. 3D Printing of Bioinspired Liquid Superrepellent Structures. Advanced Materials. 30 (22), 1800103(2019).
- Jafari, R., Cloutier, C., Allahdini, A., Momen, G. Recent progress and challenges with 3D printing of patterned hydrophobic and superhydrophobic surfaces. The International Journal of Advanced Manufacturing Technology. , 1-14 (2019).
- Vorobyev, A. Y., Guo, C. L. Multifunctional surfaces produced by femtosecond laser pulses. Journal of Applied Physics. 117 (3), 033103(2015).
- Xu, M., Kim, C. J. Method for manufacturing re-entrant microstructures. US Patent App. , 15/546,260 (2018).
- Das, R., Arunachalam, S., Ahmad, Z., Manalastas, E., Syed, A., Buttner, U., Mishra, H. Proof-of-Concept for Gas-Entrapping Membranes Derived from Water-Loving SiO2/Si/SiO2 Wafers for Greener Desalination. Journal of Visualized Experiments. , In-press e60583(2020).
재인쇄 및 허가
JoVE'article의 텍스트 или 그림을 다시 사용하시려면 허가 살펴보기
허가 살펴보기This article has been published
Video Coming Soon
Copyright © 2025 MyJoVE Corporation. 판권 소유