Method Article
Reconstrucción 3D del perfil de profundidad de las impurezas segregadas mediante espectrometría de masas de iones secundarios
En este artículo
Resumen
El método presentado describe cómo identificar y resolver artefactos de medición relacionados con la espectrometría de masas de iones secundarios, así como obtener distribuciones 3D realistas de impurezas/dopantes en materiales de estado sólido.
Resumen
El protocolo presentado combina excelentes límites de detección (1 ppm a 1 ppb) utilizando espectrometría de masas de iones secundarios (SIMS) con una resolución espacial razonable (~1 μm). Además, se describe cómo obtener distribuciones tridimensionales (3D) realistas de impurezas/dopantes segregados en materiales en estado sólido. La reconstrucción directa del perfil de profundidad en 3D suele ser difícil de lograr debido a los artefactos de medición relacionados con SIMS. Aquí se presenta un método para identificar y resolver este desafío. Se discuten tres cuestiones principales, entre ellas la i) la falta de uniformidad del detector que se compensa con la corrección de campo plano; ii) estimación y sustracción de la contribución de fondo del vacío (recuentos de oxígeno parásitos de los gases residuales presentes en la cámara de análisis); y iii) el desempeño de todos los pasos dentro de un intervalo de tiempo estable de la fuente de iones primarios. El grabado químico húmedo se utiliza para revelar la posición y los tipos de dislocación en un material, luego el resultado de SIMS se superpone a las imágenes obtenidas mediante microscopía electrónica de barrido (SEM). Por lo tanto, la posición de las impurezas aglomeradas puede relacionarse con la posición de ciertos defectos. El método es rápido y no requiere una etapa sofisticada de preparación de muestras; Sin embargo, requiere una fuente de iones estable y de alta calidad, y toda la medición debe realizarse rápidamente para evitar el deterioro de los parámetros del haz primario.
Introducción
La espectrometría de masas de iones secundarios (SIMS) es una técnica bien conocida utilizada para el monitoreo de la contaminación con excelentes límites de detección 1,2,3,4,5,6. La contribución de fondo de vacío puede ser problemática para los elementos ligeros (por ejemplo, hidrógeno, carbono, nitrógeno, oxígeno), que pueden estar presentes en forma de gases residuales en una cámara de medición. Peres et al. establecieron previamente una técnica para estimar la contribución de fondo; Por lo tanto, se puede determinar una concentración realista de átomos contaminantes7.
En muchos materiales, la distribución de los átomos contaminantes no es uniforme. El caso del nitruro de galio (GaN) es particularmente interesante, ya que se predice que el oxígeno decora principalmente las luxaciones de tornillo y mixtas 8,9,10,11. Teniendo en cuenta que la mayoría de los métodos analíticos carecen de sensibilidad o resolución espacial para detectar átomos contaminantes de baja concentración, es esencial desarrollar un procedimiento de medición SIMS que sea capaz de localizar en 3D las impurezas segregadas12.
Si bien muchos espectrómetros SIMS están equipados con detectores sensibles a la posición, una reconstrucción tridimensional directa (3D) de un perfil de profundidad es insuficiente para obtener una distribución realista de los átomos de oxígeno en una muestra de GaN. La imperfección del detector puede distorsionar la imagen e impedir que los investigadores obtengan una distribución realista de los átomos contaminantes. Sin embargo, un gran problema es la contribución de fondo al vacío, ya que generalmente el >90% de los recuentos de oxígeno registrados se originan en los gases residuales presentes en la cámara de análisis. Aquí se presenta un método para identificar y resolver adecuadamente cada uno de estos desafíos.
La falta de uniformidad del detector se puede probar en una oblea de silicio en blanco. Incluso un tiempo de integración prolongado puede conducir a la observación de cierta falta de uniformidad de la imagen de iones secundarios, debido a la sensibilidad variable de cada canal en un detector de placas de microcanales. Por lo tanto, se necesita una corrección de campo plano para obtener imágenes de alta calidad de distribuciones 3D de átomos segregados.
La contribución de fondo del vacío está relacionada con un flujo de átomos contaminantes del vacío adsorbido en el área de análisis. Teniendo en cuenta que el proceso es dinámico (es decir, la superficie de la muestra es constantemente pulverizada por el haz primario), se puede suponer que cada punto del área analizada tiene la misma probabilidad de adsorber estos átomos de oxígeno. Además, se chisporrotean casi de inmediato y no tienen tiempo suficiente para segregarse. Por lo tanto, un enfoque estadístico es el más eficiente. La eliminación aleatoria del 90% (o más) de los recuentos de oxígeno debería revelar las regiones donde se aglomera el oxígeno.
Cabe señalar que la estabilidad del haz primario es crucial para este tipo de experimentos. Después de un tiempo, la intensidad y homogeneidad del haz se deteriora, lo que reduce la calidad de la imagen. Por lo tanto, es esencial estimar un intervalo de tiempo de funcionamiento estable del haz y realizar todos los experimentos antes de que el haz se vuelva inestable. El protocolo se puede utilizar fácilmente para otros materiales y elementos detectados en los que se espera una distribución no uniforme. Es particularmente interesante combinar esto con el grabado químico húmedo, que revela las posiciones y los tipos de dislocación. Por lo tanto, la posición de las impurezas aglomeradas se puede correlacionar con la posición de los defectos.
Protocolo
1. Grabado selectivo de defectos
- Preparación de grabadores sólidos
- Prepare una mezcla eutéctica de bases fuertes de hidróxido de potasio (KOH) e hidróxido de sodio (NaOH), junto con óxido de magnesio (MgO), disolviendo y mezclando los hidróxidos alcalinos y el óxido metálico que lo componen en agua destilada. Mantenga las cantidades estequiométricas de 53,6/37,3/9,1 en % de NaOH, KOH y MgO, respectivamente13. La adición de MgO aumenta la viscosidad del grabador de tal manera que permanece en la superficie Ga-polar y no fluye por los bordes hacia la superficie N-polar13,14. Todos los productos químicos utilizados deben ser de calidad práctica.
- Calentar la mezcla en un matraz en una placa caliente a 200 °C y agitar mediante agitación magnética durante 1 h (por encima del punto de fusión del punto eutéctico KOH-NaOH).
- Enfríe la mezcla a ~100 °C reduciendo la temperatura de una placa calefactora para evaporar completamente el líquido restante. Este paso depende del tamaño del matraz y del volumen de agua, por lo que puede requerir varios minutos hasta 1 h.
- Transfiera el grabador sólido (indicado como E + M) a una botella seca, evitando la exposición a la humedad.
PRECAUCIÓN: El KOH y el NaOH pueden causar irritación de la piel y daños oculares. Trabaje con guantes y gafas. El protocolo también se puede pausar aquí.
- Grabado selectivo de defectos
- Prepare una superficie limpia de GaN para el análisis. El GaN que se cultiva epitaxialmente en zafiro se utiliza en los siguientes pasos12.
- Coloque la muestra de GaN en una placa calefactora calentada a ~450 °C. Coloque el termopar cerca de la muestra para leer con precisión la temperatura real.
- Coloque un trozo de grabador sólido E+M encima del GaN y déjelo actuar durante 3 min.
- Tome la muestra de la placa calefactora y colóquela en un vaso de precipitados con HCl caliente durante 3-5 minutos para eliminar el resto de E+M.
- Retirar la muestra del HCl e insertarla en un vaso de precipitados con agua desionizada (DI) y baño ultrasónico durante 5-10 min.
- Secar la muestra soplando N2 .
PRECAUCIÓN: El HCl puede causar irritación de la piel y daño ocular. Trabaje con guantes y gafas. Evite quemarse. El protocolo también se puede pausar aquí.
2. Observación con microscopía electrónica de barrido (SEM)
- Marque la muestra (p. ej., con un rasguño en forma de L con un cortador de rotulador de diamante).
- Monte la muestra en un trozo de metal dedicado al modelo SEM que se va a utilizar, utilizando un adhesivo conductor (es decir, cinta conductora de carbono de doble cara o un material similar). Utilice guantes durante la preparación y transferencia de muestras para evitar la contaminación de grasa de las manos.
- Agregue un trozo de cinta del paso 2.2 para conectar la superficie de la muestra con un trozo de metal para evitar la acumulación de carga en la superficie de la muestra. Alternativamente, se puede aplicar un recubrimiento pulverizado con material conductor (~ 10 nm de espesor) para evitar los efectos de carga.
- Adquirir al menos tres micrografías SEM de alta resolución (idealmente, un mínimo de cinco) de una vista superior de la muestra. Cada imagen debe mostrar un área de al menos 25 x 25 μm. Evite tomar imágenes de las regiones de la superficie con defectos macroscópicos de la superficie. La Figura 1 presenta un resultado típico.
- Tenga en cuenta la posición exacta de cada imagen con respecto al marcador en forma de L.
NOTA: El protocolo se puede pausar aquí.
3. Mediciones de espectrometría de masas de iones secundarios
- Calibración de herramientas
- Calibrar el equipo SIMS utilizando polaridad negativa, iones primarios Cs con energía de impacto de 7-13 keV. Alinee las vigas secundaria y primaria. Mantenga el haz lo más pequeño posible (al menos 1 μm de diámetro), ya que la resolución lateral está predeterminada por el tamaño del haz.
- Prepare cinco o siete configuraciones para haces con varias densidades de corriente iónica. Para simplificar, mantenga intacto el tamaño de la viga y cambie la corriente de la viga. Mida la corriente del haz y el tamaño del haz15. En los siguientes pasos, se utilizan corrientes de haz de 5 nA, 10 nA, 15 nA, 20 nA, 30 nA y 50 nA y un tamaño de punto de 1 μm.
- Utilice un tamaño de ráster de 50 x 50 μm y un área de análisis de 35 x 35 μm para los siguientes pasos. Elija 256 x 256 píxeles para la resolución espacial. Si no se especifica lo contrario, utilice un tiempo de integración estándar para cada señal (normalmente 1-2 s).
- Estabilidad de la fuente primaria
- Elija un ajuste con una corriente de haz moderada (15-20 nA).
- Obtenga una serie de imágenes utilizando el ion secundario 30Si2- para una oblea de silicio en blanco. Para cada imagen, integre la señal durante 5-10 min.
- Realice comparaciones píxel a píxel de todas las imágenes con la primera imagen. Si el >5% de los píxeles muestran una diferencia del >5% con respecto a la primera imagen, esto indica que el haz se volvió inestable. Tenga en cuenta el intervalo de tiempo de la estabilidad del haz.
- Medición
NOTA: Los siguientes pasos se realizan dentro de un intervalo de tiempo estable de la viga.- Siga el procedimiento descrito por Peres et al. para estimar el nivel de fondo de contaminación por oxígeno en la cámara de medición7. Para cada medición, no es necesario obtener los valores absolutos de concentración de oxígeno, ya que la relación de intensidad de las señales de 16 O y 69Ga- es suficiente.
- Utilice los ajustes de haz preparados en el paso 3.1.2. Realice al menos cinco mediciones para cada ajuste del haz. Obtenga un perfil de profundidad utilizando un ion secundario de 16 O-, alcance una profundidad de ~ 200 nm y mida la intensidad del ion secundario de 69Ga- integrando la señal durante 10-15 s. No realice esto en regiones donde se hayan obtenido imágenes SEM.
- Grafique la relación de intensidad de las señales de 16 O y 69Ga- en función de la densidad de corriente primaria invertida (no es necesario calcular valores absolutos). Se espera un buen ajuste lineal (aquí, R2 = 0,997). Estime la contribución de fondo de vacío como se muestra en la Figura 2.
- Elija un haz intenso (30 nA) para los siguientes pasos. Obtenga una imagen que se utilizará para la corrección de campo plano. Utilice un ion secundario de 30Si2- para una oblea de silicio en blanco. Integre la señal durante 5-10 min. La Figura 3 presenta un resultado típico.
- Realice mediciones de perfil de profundidad en las mismas regiones donde se adquirieron las imágenes SEM. Utilizando un ion secundario de 16O-, integre la señal durante 3-5 s para cada punto de datos.
NOTA: El protocolo se puede pausar aquí.
4. Tratamiento de datos
- Reconstruya una imagen 3D a partir de un perfil de profundidad.
- Realice la corrección de campo plano: normalice píxel a píxel cada imagen de 16iones O utilizando una imagen de referencia obtenida en el paso 3.3.4. La Figura 4A presenta los datos sin procesar y la Figura 4B presenta la imagen después de la corrección de campo plano.
- Estime la contribución del fondo de vacío a partir de una gráfica obtenida en el paso 3.3.2. No es necesario calcular valores absolutos; Sin embargo, tenga en cuenta el porcentaje específico de los recuentos totales que se pueden atribuir a la contribución de fondo de vacío. Un valor entre el 90 y el 95% es típico para un experimento de este tipo.
- Reste la contribución de fondo del vacío: elimine aleatoriamente el 90-95% de los 16 recuentos O registrados. La Figura 4C presenta un resultado típico para un solo plano.
- Trace los recuentos restantes como una imagen 3D. La figura 5 presenta un resultado típico.
- Integre señales de todos los puntos de datos y superponga la imagen 2D sobre la imagen SEM obtenida previamente utilizando cualquier software de edición de imágenes con soporte de capas. Trate la imagen SEM como fondo. Una capa que contenga resultados de SIMS solo debe contener recuentos reales como píxeles de color (elimine las regiones blancas intermedias). Añade ~30% de transparencia a esta capa. La figura 6 presenta un resultado típico
Resultados
En la imagen 3D se deben observar estructuras muy claras en forma de pilar. Se debe aglomerar más oxígeno en una región más cercana a la superficie, ya que el proceso de grabado introduce más oxígeno que puede difundirse a través de la muestra. La Figura 7 presenta una imagen 3D de los datos sin procesar y una animación de cómo el procedimiento de reducción revela el resultado final. La Figura 4C también presenta un resultado típico para un solo plano.
La imagen SIMS superpuesta a la imagen SEM revela que el oxígeno se aglomera a lo largo de los núcleos de los pozos de grabado más grandes. Estos pueden atribuirse a luxaciones mixtas/de tornillo15. Cabe señalar que si el núcleo es más pequeño que el tamaño de un haz primario, la imagen secundaria heredará el tamaño y la forma del haz primario. En experimentos subóptimos, se puede ver una distribución aleatoria de los recuentos de oxígeno (Figura 8). La Figura 9 presenta una situación en la que el haz se vuelve inestable durante el experimento. En concreto, la calidad es alta para una región tan cercana a la superficie, pero se deteriora gradualmente durante el experimento.
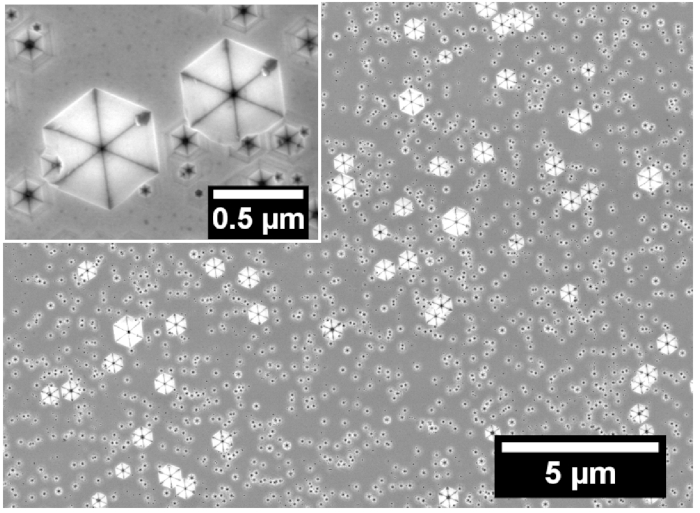
Figura 1: Micrografías SEM de hoyos de grabado revelados en la superficie de GaN usando grabado E+M. Los parámetros de grabado se ajustaron a 450 °C durante 3 min. El recuadro muestra una micrografía ampliada con hoyos hexagonales revelados generados en núcleos de dislocación. Los dos pozos más grandes (>500 nm) representan dislocaciones con componente de tornillo del vector de Burgers. Esta figura ha sido reproducida con permiso12. Haga clic aquí para ver una versión más grande de esta figura.

Figura 2: Concentración media de O- frente a corriente primaria inversa. La contribución del fondo de vacío se puede estimar a partir de la gráfica. Las barras de error representan la desviación estándar de cada conjunto de datos (cinco mediciones). Haga clic aquí para ver una versión más grande de esta figura.
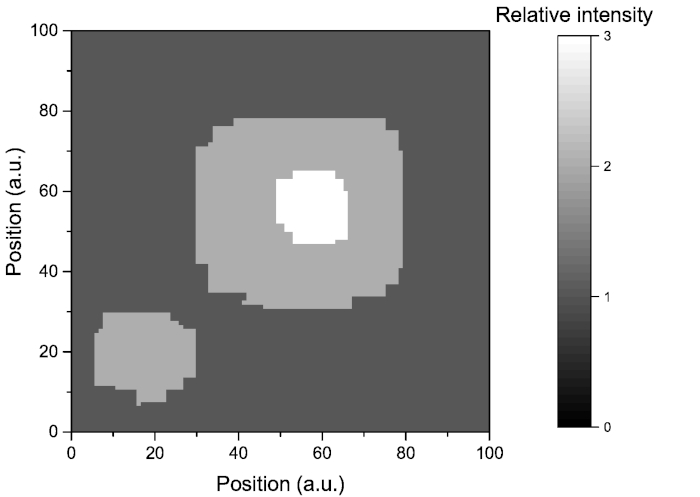
Figura 3: Una imagen típica de iones secundarios de 30Si2- para una oblea de silicio en blanco. Las diferencias de intensidad son causadas por la falta de uniformidad del detector. Haga clic aquí para ver una versión más grande de esta figura.

Figura 4: Vista plana típica de la distribución de los recuentos de oxígeno medidos en modo 3D. Se muestran las imágenes (A) de datos sin procesar, (B) después de la corrección de campo plano y (C) después de restar la contribución del fondo de vacío. Esta figura ha sido adaptada con permiso12. Haga clic aquí para ver una versión más grande de esta figura.

Figura 5: Vista 3D de los recuentos de oxígeno en uncuboide de 5 μ m x 5 μ m x 1 μm. Para una mejor visibilidad, la escala z es alargada. Consulte la Figura complementaria 1 para ver la animación. Esta figura ha sido adaptada con permiso12. Haga clic aquí para ver una versión más grande de esta figura.

Figura 6: Distribución lateral de iones secundarios de oxígeno (píxeles azules) proyectados en la micrografía SEM. A pesar de los artefactos relacionados con SIMS (resolución lateral determinada por el tamaño del haz primario), se observa una clara correlación entre las posiciones de los pozos más grandes y el oxígeno. Esta figura ha sido adaptada con permiso12. Haga clic aquí para ver una versión más grande de esta figura.

Figura 7: Animación que muestra cómo se realiza el procedimiento de reducción. Al comienzo del procedimiento, todos los recuentos están presentes, luego, para cada capa, el 90% de los recuentos se eliminan aleatoriamente. Haga clic aquí para descargar esta animación.

Figura 8: Distribución aleatoria de los recuentos de oxígeno en un experimento subóptimo. Haga clic aquí para ver una versión más grande de esta figura.

Figura 9: Experimento realizado con un haz inestable. La calidad disminuye con la profundidad chisporroteante. Haga clic aquí para ver una versión más grande de esta figura.
Figura complementaria 1. Haga clic aquí para descargar esta figura.
Discusión
Los problemas de falta de uniformidad del detector y la contribución de fondo del vacío son fáciles de resolver mediante la corrección de campo plano y la sustracción de recuentos parásitos, respectivamente. El procedimiento de sustracción no es perfecto, ya que puede restar una contribución donde se ha aglomerado oxígeno. Por el contrario, en la otra posición, no afectará el recuento de fondo; Por lo tanto, algunos recuentos artificiales pueden seguir presentes, mientras que algunos recuentos reales se reducen. Sin embargo, es lo suficientemente eficiente y sensible como para proporcionar resultados aceptables.
La inestabilidad del haz primario es la más problemática, ya que el deterioro de los parámetros del haz primario desenfocará la imagen del ion secundario; por lo tanto, no se puede obtener información confiable sobre la muestra. La sección 3.2 del protocolo es particularmente importante. Por ejemplo, para un haz bien alineado, la primera imagen de iones secundarios de 30Si2- refleja la falta de uniformidad del detector, pero después de un tiempo, la imagen comenzará a cambiar. Esto se debe al deterioro de los parámetros del haz primario (es decir, pérdida de corriente primaria, desenfoque, deriva de posición, etc.). Por lo tanto, es importante estimar el intervalo de tiempo de la estabilidad del haz. Se recomienda iniciar el experimento 2-3 h después de la inicialización del haz, ya que suele ser más estable.
Si el experimento se realiza dentro de un intervalo de tiempo estable del haz y el resultado aún no es satisfactorio, se recomienda considerar la calidad del haz primario. Para un haz primario pequeño, es más difícil confirmar una calidad suficiente observando solo una imagen de iones secundarios. Por lo tanto, se recomienda realizar pruebas de rugosidad de microscopía de fuerza atómica en el fondo del cráter después de pulverizar ~ 1 μm de un material muy plano (es decir, una oblea de silicio en blanco). Si la rugosidad cuadrática media es superior a 1 nm, se requiere una mayor optimización del haz primario.
El tamaño del haz limita la resolución lateral de este método. SIMS puede obtener imágenes de características que son más pequeñas que el tamaño del haz, pero la imagen de iones secundarios heredará la forma y el tamaño del haz de iones primario. Si la distancia entre dos entidades es menor que el tamaño del haz, la imagen de iones secundarios las difuminará. A pesar de estos problemas, el método permite a los usuarios obtener una distribución 3D realista de impurezas/dopantes en muestras de estado sólido. Además, cualquier segregación espacial de átomos se puede correlacionar con la posición de los defectos y las interfaces.
En el caso de las estructuras basadas en GaN (es decir, decoradas con oxígeno), las dislocaciones que actúan como centros locales de recombinación no radiativa son responsables de la conductividad de tipo n. En el caso de otros materiales, cualquier falta de homogeneidad en la distribución de átomos dopantes/contaminantes puede tener un impacto importante en el rendimiento de un dispositivo. Por lo tanto, el protocolo es particularmente útil para el análisis de fallas y la optimización de los procedimientos de crecimiento y procesamiento.
Divulgaciones
Los autores no tienen nada que revelar.
Agradecimientos
Este trabajo contó con el apoyo parcial del Centro Nacional de Ciencias (NCN) en el marco de los proyectos SONATA14 2018/31/D/ST5/00399 y OPUS10 2015/19/B/ST7/02163.
Materiales
| Name | Company | Catalog Number | Comments |
| Heating plate with ceramic top plate | IKA - Werke GmbH | 3644200 | for defect selective etching; yellow MAG HP 7 |
| Hydrochloric acid (HCl) solution 35-38% | Chempur | 115752837 | for etchant removal; pure p.a.; CAS: 7647-01-0 |
| Magnesium oxide (MgO) | Chempur | 116140200 | for eutectic solid etchant prepration; pure p.a.; CAS: 1309-48-4 |
| Potassium hydroxide (KOH) | POCH S.A. | 746800113 | for eutectic solid etchant prepration; pure p.a.; CAS: 1310-58-3 |
| Sodium hydroxide (NaOH) | POCH S.A. | 810925112 | for eutectic solid etchant prepration; pure p.a.; CAS: 1310-73-2 |
| Secondary ion mass spectrometer | CAMECA | IMS SC Ultra | |
| Scanning electron microscope | Hitachi | SU8230 |
Referencias
- Wittmaack, K. High-sensitivity depth profiling of arsenic and phosphorus in silicon by means of SIMS. Applied Physics Letters. 29, 552(1976).
- Ber, B. Y., et al. Secondary ion mass spectroscopy investigations of magnesium and carbon doped gallium nitride films grown by molecular beam epitaxy. Semiconductor Science and Technology. 13, 71-74 (1998).
- Chiou, C. Y., Wang, C. C., Ling, Y. C., Chiang, C. I. Secondary ion mass spectrometry analysis of In-doped p-type GaN films. Applied Surface Science. 203-204, 482-485 (2003).
- Emziane, M., Durose, K., Halliday, D. P., Bosio, A., Romeo, N. In situ oxygen incorporation and related issues in CdTe/CdS photovoltaic devices. Journal of Applied Physics. 100, 013513(2006).
- Matsunaga, T., Yoshikawa, S., Tsukamoto, K. Secondary ion yields of C, Si, Ge and Cs surface density and concentration in SIMS. Surface Science. 515, 390-402 (2002).
- Gnaser, H. SIMS detection in the 1012 atoms cm−3 range. Surface and Interface Analysis. 25, 737-740 (1997).
- Peres, P., Merkulov, A., Choi, S. Y., Desse, F., Schuhmacher, M. Characterization of LED materials using dynamic SIMS. Surface and Interface Analysis. 45, 437-440 (2013).
- Arslan, I., Browning, N. D. Role of Oxygen at Screw Dislocations in GaN. Physical Review Letters. 91, 165501(2003).
- Hawkridge, M. E., Cherns, D. Oxygen segregation to dislocations in GaN. Applied Physics Letters. 87, 221903(2005).
- Arslan, I., Bleloch, A., Stach, E. A., Ogut, S., Browning, N. D. Using EELS to observe composition and electronic structure variations at dislocation cores in GaN. Philosophical Magazine. 86, 4727-4746 (2006).
- Hautakangas, S., et al. Gallium and nitrogen vacancies in GaN: Impurity decoration effects. Physica B: Condensed Matter. 376-377, 424-427 (2006).
- Michałowski, P. P., Złotnik, S., Rudziński, M. Three dimensional localization of unintentional oxygen impurities in gallium nitride. Chemical Communications. 55, 11539(2019).
- Kamler, G., Weyher, J. L., Grzegory, I., Jezierska, E., Wosiński, T. Defect-selective etching of GaN in a modified molten bases system. Journal of Crystal Growth. 246, 21-24 (2002).
- Zhuang, D., Edgar, J. H., Strojek, B., Chaudhuri, J., Rek, Z. Defect-selective etching of bulk AlN single crystals in molten KOH/NaOH eutectic alloy. Journal of Crystal Growth. 262, 89-94 (2004).
- SC-Ultra, User's Guide. , CAMECA. Gennerviliers. (2005).
- Weyher, J. vL., et al. Orthodox etching of HVPE-grown GaN. Journal of Crystal Growth. 305, 384-392 (2007).
Reimpresiones y Permisos
Solicitar permiso para reutilizar el texto o las figuras de este JoVE artículos
Solicitar permisoExplorar más artículos
This article has been published
Video Coming Soon
ACERCA DE JoVE
Copyright © 2025 MyJoVE Corporation. Todos los derechos reservados