Method Article
Reconstrução de perfil de profundidade 3D de impurezas segregadas usando espectrometria de massa de íons secundários
Neste Artigo
Resumo
O método apresentado descreve como identificar e resolver artefatos de medição relacionados à espectrometria de massa de íons secundários, bem como obter distribuições 3D realistas de impurezas/dopantes em materiais de estado sólido.
Resumo
O protocolo apresentado combina excelentes limites de detecção (1 ppm a 1 ppb) usando espectrometria de massa de íons secundários (SIMS) com resolução espacial razoável (~1 μm). Além disso, descreve como obter distribuições tridimensionais (3D) realistas de impurezas/dopantes segregados em materiais de estado sólido. A reconstrução direta do perfil de profundidade 3D é muitas vezes difícil de alcançar devido a artefatos de medição relacionados ao SIMS. Apresentamos aqui um método para identificar e resolver este desafio. Três questões principais são discutidas, incluindo a i) não uniformidade do detector sendo compensada pela correção de campo plano; ii) estimativa e subtração da contribuição de fundo do vácuo (contagens parasitárias de oxigênio dos gases residuais presentes na câmara de análise); e iii) realização de todas as etapas dentro de um período de tempo estável da fonte primária de íons. O condicionamento químico úmido é usado para revelar a posição e os tipos de deslocamento em um material, então o resultado do SIMS é sobreposto às imagens obtidas por microscopia eletrônica de varredura (MEV). Assim, a posição das impurezas aglomeradas pode estar relacionada à posição de certos defeitos. O método é rápido e não requer etapas sofisticadas de preparação da amostra; no entanto, requer uma fonte de íons estável e de alta qualidade, e toda a medição deve ser realizada rapidamente para evitar a deterioração dos parâmetros do feixe primário.
Introdução
A espectrometria de massa com íons secundários (SIMS) é uma técnica bem conhecida para monitoramento de contaminações com excelentes limites de detecção 1,2,3,4,5,6. A contribuição de fundo do vácuo pode ser problemática para elementos leves (por exemplo, hidrogênio, carbono, nitrogênio, oxigênio), que podem estar presentes na forma de gases residuais em uma câmara de medição. estabeleceram previamente uma técnica para estimar a contribuição de fundo; assim, pode-se determinar uma concentração realista de átomos contaminantes7.
Em muitos materiais, a distribuição dos átomos contaminantes não é uniforme. O caso do nitreto de gálio (GaN) é particularmente interessante, pois se prevê que o oxigênio decora principalmente luxações de parafuso e mistas 8,9,10,11. Considerando que a maioria dos métodos analíticos carece de sensibilidade ou resolução espacial para detectar átomos contaminantes em baixa concentração, é essencial desenvolver um procedimento de medição SIMS que seja capaz de localizar 3D impurezas segregadas12.
Enquanto muitos espectrômetros SIMS são equipados com detectores sensíveis à posição, uma reconstrução tridimensional direta (3D) de um perfil de profundidade é insuficiente para obter distribuição realista de átomos de oxigênio em uma amostra de GaN. A imperfeição do detector pode distorcer a imagem e impedir que os pesquisadores obtenham uma distribuição realista dos átomos contaminantes. No entanto, um grande problema é a contribuição de fundo do vácuo, pois geralmente >90% das contagens de oxigênio registradas se originam de gases residuais presentes na câmara de análise. Apresentamos aqui um método para identificar e resolver adequadamente cada um desses desafios.
A não uniformidade do detector pode ser testada em um wafer de silício em branco. Mesmo um longo tempo de integração pode levar à observação de alguma não uniformidade da imagem de íons secundários, devido à sensibilidade variável de cada canal em um detector de placas de microcanais. Portanto, a correção de campo plano é necessária para obter imagens de alta qualidade de distribuições 3D de átomos segregados.
A contribuição de fundo do vácuo está relacionada a um fluxo de átomos contaminantes do vácuo adsorvido na área de análise. Considerando que o processo é dinâmico (isto é, a superfície da amostra é constantemente pulverizada pelo feixe primário), pode-se supor que cada ponto da área analisada tem a mesma probabilidade de adsorver esses átomos de oxigênio. Além disso, eles são quase imediatamente espalhados e não têm tempo suficiente para segregar. Portanto, uma abordagem estatística é a mais eficiente. A eliminação aleatória de 90% (ou mais) das contagens de oxigênio deve revelar regiões onde o oxigênio está aglomerado.
Ressalta-se que a estabilidade do feixe primário é fundamental para esse tipo de experimento. Após algum tempo, a intensidade e homogeneidade do feixe se deterioram, o que reduz a qualidade da imagem. Portanto, é essencial estimar um período de tempo de operação estável do feixe e realizar todos os experimentos antes que o feixe se torne instável. O protocolo pode ser facilmente utilizado para outros materiais e elementos detectados nos quais se espera uma distribuição não uniforme. É particularmente interessante combinar isso com o condicionamento químico úmido, que revela as posições e os tipos de deslocamento. Assim, a posição das impurezas aglomeradas pode ser correlacionada com a posição dos defeitos.
Protocolo
1. Corrosão seletiva de defeitos
- Preparação sólida de etchant
- Preparar mistura eutética de bases fortes de hidróxido de potássio (KOH) e hidróxido de sódio (NaOH), juntamente com óxido de magnésio (MgO), dissolvendo e misturando os hidróxidos alcalinos e óxido metálico em água destilada. Manter quantidades estequiométricas de 53,6/37,3/9,1 a % de NaOH, KOH e MgO, respectivamente13. A adição de MgO aumenta a viscosidade do etchant de tal forma que ele permanece na superfície polar de Ga, e não flui sobre as bordas para a superfície N-polar13,14. Todos os produtos químicos utilizados devem ser de qualidade prática.
- Aquecer a mistura num balão sobre uma placa quente a 200 °C e agitar por agitação magnética durante 1 h (acima do ponto de fusão do ponto eutético KOH-NaOH).
- Resfriar a mistura a ~100 °C reduzindo a temperatura de uma placa quente para evaporar completamente o líquido restante. Esta etapa depende do tamanho do frasco e do volume de água, por isso pode levar vários minutos até 1 h.
- Transfira o etchant sólido (indicado como E+M) para um frasco seco, evitando a exposição à umidade.
CUIDADO: KOH e NaOH podem causar irritação da pele e danos nos olhos. Trabalhe com luvas e óculos. O protocolo também pode ser pausado aqui.
- Corrosão seletiva por defeito
- Prepare uma superfície de GaN limpa para a análise. A GaN que é epitaxialmente cultivada em safira é usada nas etapas a seguir12.
- Coloque a amostra de GaN em uma placa quente aquecida a ~450 °C. Coloque o termopar perto da amostra para ler com precisão a temperatura real.
- Coloque um pedaço de etchant sólido E+M em cima do GaN e deixe por 3 min.
- Retire a amostra da placa quente e coloque em um copo com HCl quente por 3-5 min para eliminar o E+M restante.
- Retire a amostra do HCl e insira em um copo com água deionizada (DI) e banho ultrassônico por 5-10 min.
- Secar a amostra por sopro N2 .
CUIDADO: HCl pode causar irritação da pele e danos oculares. Trabalhe com luvas e óculos. Evite se queimar. O protocolo também pode ser pausado aqui.
2. Observação por microscopia eletrônica de varredura (MEV)
- Marque a amostra (por exemplo, com um arranhão em forma de L usando um cortador de caneta de diamante).
- Monte a amostra em um stub metálico dedicado ao modelo de MEV a ser usado, usando um adesivo condutor (ou seja, fita condutora de carbono dupla face ou um material similar). Use luvas durante o preparo e a transferência da amostra para evitar a contaminação da gordura das mãos.
- Adicione um pedaço da fita da etapa 2.2 para conectar a superfície da amostra com um esboço de metal para evitar o acúmulo de carga na superfície da amostra. Alternativamente, um revestimento pulverizado com material condutor (~10 nm de espessura) pode ser aplicado para evitar efeitos de carregamento.
- Adquira pelo menos três micrografias de MEV de alta resolução (idealmente, um mínimo de cinco) de uma visão superior da amostra. Cada imagem deve exibir uma área de pelo menos 25 x 25 μm. Evite tirar imagens das regiões superficiais com defeitos macroscópicos da superfície. A Figura 1 apresenta um resultado típico.
- Observe a posição exata de cada imagem em relação ao marcador em forma de L.
NOTA: O protocolo pode ser pausado aqui.
3. Medições de espectrometria de massa de íons secundários
- Calibração da ferramenta
- Calibrar o equipamento SIMS utilizando polaridade negativa, íons primários Cs com energia de impacto de 7-13 keV. Alinhe as vigas secundária e primária. Mantenha o feixe o menor possível (pelo menos 1 μm de diâmetro), pois a resolução lateral é pré-determinada pelo tamanho do feixe.
- Prepare de cinco a sete ajustes para feixes com várias densidades de corrente iônica. Para simplificar, mantenha o tamanho do feixe intacto e altere a corrente do feixe. Medir a corrente do feixe e o tamanho do feixe15. Nas etapas seguintes, são utilizadas correntes de feixe de 5 nA, 10 nA, 15 nA, 20 nA, 30 nA e 50 nA e um tamanho de ponto de 1 μm.
- Use um tamanho de raster de 50 x 50 μm e uma área de análise de 35 x 35 μm para as etapas a seguir. Escolha 256 x 256 pixels para resolução espacial. Se não for especificado de outra forma, use um tempo de integração padrão para cada sinal (normalmente 1-2 s).
- Estabilidade da fonte primária
- Escolha uma configuração com uma corrente de feixe moderada (15-20 nA).
- Obtenha séries de imagens usando 30Si2- íon secundário para um wafer de silício em branco. Para cada imagem, integre o sinal por 5-10 min.
- Execute comparações pixel a pixel de todas as imagens com a primeira imagem. Se >5% dos pixels mostram uma diferença de >5% em relação à primeira imagem, isso indica que o feixe se tornou instável. Observe o tempo de estabilidade da viga.
- Medição
NOTA: As etapas a seguir são executadas dentro de um período de tempo estável do feixe.- Seguir o procedimento descrito por Peres e col. para estimar o nível de fundo de contaminação por oxigênio na câmara de medição7. Para cada medida, não há necessidade de se obter os valores absolutos da concentração de oxigênio, pois a razão de intensidade dos sinais de 16O- e 69Ga- é suficiente.
- Use as configurações de feixe preparadas na etapa 3.1.2. Realizar pelo menos cinco medições para cada ajuste de feixe. Obter um perfil de profundidade usando íon secundário de 16O-, atingir uma profundidade de ~200 nm e medir a intensidade de íon secundário de 69Ga- integrando o sinal por 10-15 s. Não faça isso em regiões onde imagens de MEV foram obtidas.
- Plotar a razão de intensidade dos sinais 16O- e 69Ga- em função da densidade de corrente primária inversa (não há necessidade de calcular valores absolutos). Espera-se um bom ajuste linear (aqui, R2 = 0,997). Estime a contribuição de fundo do vácuo como mostrado na Figura 2.
- Escolha um feixe intenso (30 nA) para as etapas a seguir. Obtenha uma imagem que será usada para correção de campo plano. Use um íon secundário de 30Si2- para um wafer de silício em branco. Integre o sinal por 5-10 min. A Figura 3 apresenta um resultado típico.
- Realizar medições de perfil de profundidade nas mesmas regiões onde as imagens de MEV foram adquiridas. Usando um íon secundário de 16O-, integre o sinal por 3-5 s para cada ponto de dados.
NOTA: O protocolo pode ser pausado aqui.
4. Tratamento de dados
- Reconstruir uma imagem 3D a partir de um perfil de profundidade.
- Execute a correção de campo plano: pixel-to-pixel normalize cada imagem de íons O- 16usando uma imagem de referência obtida na etapa 3.3.4. A Figura 4A apresenta os dados brutos e a Figura 4B apresenta a imagem após a correção de campo plano.
- Estimar a contribuição de fundo do vácuo a partir de uma parcela obtida na etapa 3.3.2. Não há necessidade de calcular valores absolutos; no entanto, observe a porcentagem específica das contagens totais que pode ser atribuída à contribuição de fundo de vácuo. Um valor entre 90-95% é típico para tal experimento.
- Subtraia a contribuição de fundo de vácuo: elimine aleatoriamente 90-95% das 16contagens de O- registradas. A Figura 4C apresenta um resultado típico para um único plano.
- Plote as contagens restantes como uma imagem 3D. A Figura 5 apresenta um resultado típico.
- Integre sinais de todos os pontos de dados e sobreponha a imagem 2D à imagem SEM obtida anteriormente usando qualquer software editor de imagem com suporte a camadas. Trate a imagem SEM como plano de fundo. Uma camada contendo resultados do SIMS deve conter apenas contagens reais como pixels coloridos (exclua as regiões brancas entre elas). Adicione ~30% de transparência a esta camada. A Figura 6 apresenta um resultado típico
Resultados
Estruturas em forma de pilar muito claras devem ser observadas na imagem 3D. Mais oxigênio deve ser aglomerado em uma região mais próxima da superfície, uma vez que o processo de condicionamento introduz mais oxigênio que pode se difundir através da amostra. A Figura 7 apresenta uma imagem 3D dos dados brutos e uma animação de como o procedimento de redução revela o resultado final. A Figura 4C também apresenta um resultado típico para um único plano.
A imagem SIMS sobreposta à imagem SEM revela que o oxigênio está aglomerado ao longo dos núcleos dos maiores poços de gravação. Estes podem ser atribuídos a luxações mistas/parafusos15. Deve-se notar que, se o núcleo for menor do que o tamanho de um feixe primário, a imagem secundária herdará o tamanho e a forma do feixe primário. Em experimentos subótimos, uma distribuição aleatória das contagens de oxigênio pode ser observada (Figura 8). A Figura 9 apresenta uma situação em que o feixe torna-se instável durante o experimento. Especificamente, a qualidade é alta para uma região tão próxima da superfície, mas se deteriora gradualmente durante o experimento.
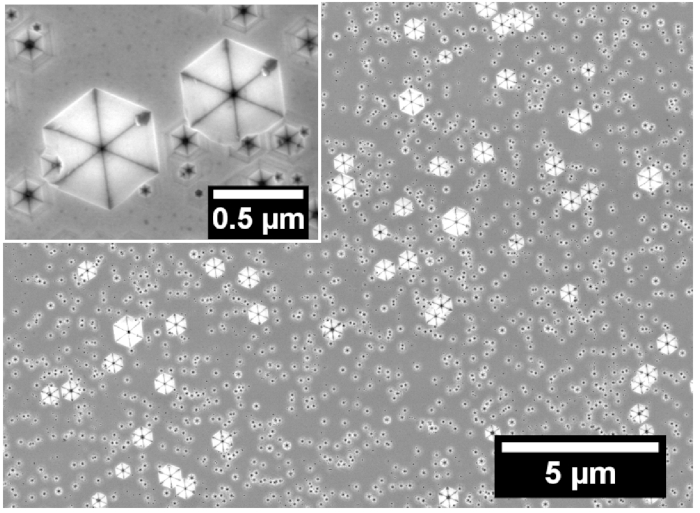
Figura 1: Micrografias por MEV de fossas de condicionamento condicionado reveladas na superfície de GaN usando etch E+M. Os parâmetros de condicionamento foram fixados em 450 oC por 3 min. O inset mostra uma micrografia ampliada com fossas hexagonais reveladas geradas nos núcleos de deslocamento. Os dois maiores poços (>500 nm) representam deslocamentos com componente parafuso do vetor Burgers. Esse número foi reproduzido com permissão12. Clique aqui para ver uma versão maior desta figura.

Figura 2: Concentração média de O- vs. corrente primária inversa. A contribuição de fundo do vácuo pode ser estimada a partir do gráfico. As barras de erro representam o desvio padrão de cada conjunto de dados (cinco medidas). Clique aqui para ver uma versão maior desta figura.
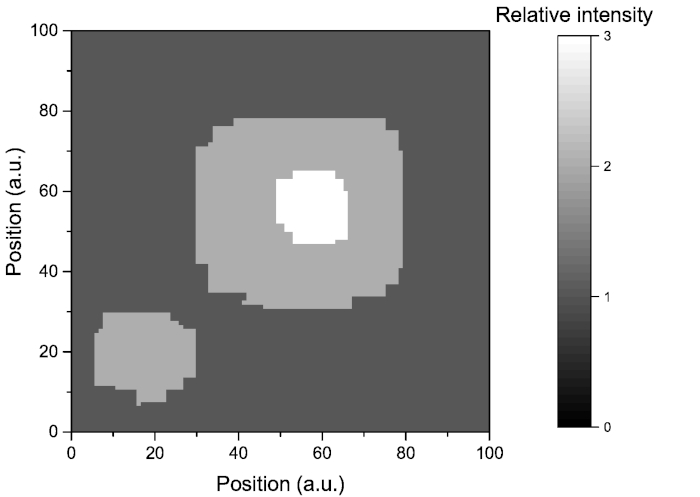
Figura 3: Uma imagem típica de íon secundário de 30Si2 para um wafer de silício em branco. As diferenças de intensidade são causadas pela não uniformidade do detector. Clique aqui para ver uma versão maior desta figura.

Figura 4: Vista plana típica da distribuição das contagens de oxigênio medidas no modo 3D. São mostradas imagens (A) a partir de dados brutos, (B) após correção de campo plano e (C) após subtração da contribuição de fundo a vácuo. Essa figura foi adaptada com permissão12. Clique aqui para ver uma versão maior desta figura.

Figura 5: Vista 3D das contagens de oxigênio em umcuboide de 5 μ m x 5 μ m x 1 μ m. Para melhor visibilidade, a escala z é alongada. Consulte a Figura Suplementar 1 para ver a animação. Essa figura foi adaptada com permissão12. Clique aqui para ver uma versão maior desta figura.

Figura 6: Distribuição lateral dos íons secundários de oxigênio (pixels azuis) projetados na micrografia de MEV. Apesar dos artefatos relacionados ao SIMS (resolução lateral determinada pelo tamanho do feixe primário), observa-se uma clara correlação entre as posições das maiores cavas e o oxigênio. Essa figura foi adaptada com permissão12. Clique aqui para ver uma versão maior desta figura.

Figura 7: Animação mostrando como o procedimento de redução é realizado. No início do procedimento, todas as contagens estão presentes, então, para cada camada, 90% das contagens são eliminadas aleatoriamente. Clique aqui para baixar esta animação.

Figura 8: Distribuição aleatória das contagens de oxigênio em experimento subótimo. Clique aqui para ver uma versão maior desta figura.

Figura 9: Experimento realizado com viga instável. A qualidade morre com a profundidade de sputtering. Clique aqui para ver uma versão maior desta figura.
Figura suplementar 1. Clique aqui para baixar esta figura.
Discussão
Problemas de não uniformidade do detector e contribuição de fundo de vácuo são fáceis de resolver por correção de campo plano e subtração de contagens parasitárias, respectivamente. O procedimento de subtração não é perfeito, pois pode subtrair uma contribuição onde o oxigênio foi aglomerado. Em contraste, na outra posição, deixará a contagem de fundo inalterada; assim, algumas contagens artificiais ainda podem estar presentes enquanto algumas contagens reais são reduzidas. No entanto, é eficiente e sensível o suficiente para fornecer resultados aceitáveis.
A instabilidade do feixe primário é a mais problemática, pois a deterioração dos parâmetros do feixe primário irá borrar a imagem do íon secundário; assim, não é possível obter informações confiáveis sobre a amostra. A secção 3.2 do protocolo é particularmente importante. Por exemplo, para um feixe bem alinhado, a primeira imagem de íons secundários de 30Si2- reflete a não uniformidade do detector, mas depois de algum tempo, a imagem começará a mudar. Isso é causado pela deterioração dos parâmetros do feixe primário (ou seja, perda de corrente primária, desfocagem, desvio de posição, etc.). Portanto, é importante estimar o tempo de estabilidade do feixe. Recomenda-se iniciar o experimento 2-3 h após a inicialização do feixe, pois ele é tipicamente mais estável.
Se o experimento for realizado dentro de um tempo estável do feixe e o resultado ainda não for satisfatório, recomenda-se considerar a qualidade do feixe primário. Para um feixe primário pequeno, é mais desafiador confirmar qualidade suficiente observando apenas uma imagem de íon secundário. Portanto, é aconselhável realizar testes de rugosidade por microscopia de força atômica no fundo da cratera após a pulverização de ~1 μm de um material muito plano (ou seja, um wafer de silício em branco). Se a rugosidade quadrática média da raiz estiver acima de 1 nm, então uma otimização adicional do feixe primário é necessária.
O tamanho da viga limita a resolução lateral deste método. O SIMS pode criar imagens de feições menores do que o tamanho do feixe, mas a imagem de íon secundário herdará a forma e o tamanho do feixe de íons primário. Se uma distância entre duas feições for menor do que o tamanho do feixe, a imagem de íon secundário irá desfocá-las juntas. Apesar desses problemas, o método permite aos usuários obter uma distribuição 3D realista de impurezas/dopantes em amostras de estado sólido. Além disso, qualquer segregação espacial dos átomos pode ser correlacionada com a posição dos defeitos e interfaces.
Para estruturas baseadas em GaN (isto é, decoradas com oxigênio), deslocamentos que atuam como centros locais de recombinação não radiativa são responsáveis pela condutividade do tipo n. Para outros materiais, qualquer falta de homogeneidade na distribuição dos átomos dopantes/contaminantes pode ter grandes impactos no desempenho de um dispositivo. Assim, o protocolo é particularmente útil para análise de falhas e otimização de procedimentos de crescimento e processamento.
Divulgações
Os autores não têm nada a revelar.
Agradecimentos
Este trabalho foi parcialmente apoiado pelo National Science Centre (NCN) no âmbito dos projetos SONATA14 2018/31/D/ST5/00399 e OPUS10 2015/19/B/ST7/02163.
Materiais
| Name | Company | Catalog Number | Comments |
| Heating plate with ceramic top plate | IKA - Werke GmbH | 3644200 | for defect selective etching; yellow MAG HP 7 |
| Hydrochloric acid (HCl) solution 35-38% | Chempur | 115752837 | for etchant removal; pure p.a.; CAS: 7647-01-0 |
| Magnesium oxide (MgO) | Chempur | 116140200 | for eutectic solid etchant prepration; pure p.a.; CAS: 1309-48-4 |
| Potassium hydroxide (KOH) | POCH S.A. | 746800113 | for eutectic solid etchant prepration; pure p.a.; CAS: 1310-58-3 |
| Sodium hydroxide (NaOH) | POCH S.A. | 810925112 | for eutectic solid etchant prepration; pure p.a.; CAS: 1310-73-2 |
| Secondary ion mass spectrometer | CAMECA | IMS SC Ultra | |
| Scanning electron microscope | Hitachi | SU8230 |
Referências
- Wittmaack, K. High-sensitivity depth profiling of arsenic and phosphorus in silicon by means of SIMS. Applied Physics Letters. 29, 552(1976).
- Ber, B. Y., et al. Secondary ion mass spectroscopy investigations of magnesium and carbon doped gallium nitride films grown by molecular beam epitaxy. Semiconductor Science and Technology. 13, 71-74 (1998).
- Chiou, C. Y., Wang, C. C., Ling, Y. C., Chiang, C. I. Secondary ion mass spectrometry analysis of In-doped p-type GaN films. Applied Surface Science. 203-204, 482-485 (2003).
- Emziane, M., Durose, K., Halliday, D. P., Bosio, A., Romeo, N. In situ oxygen incorporation and related issues in CdTe/CdS photovoltaic devices. Journal of Applied Physics. 100, 013513(2006).
- Matsunaga, T., Yoshikawa, S., Tsukamoto, K. Secondary ion yields of C, Si, Ge and Cs surface density and concentration in SIMS. Surface Science. 515, 390-402 (2002).
- Gnaser, H. SIMS detection in the 1012 atoms cm−3 range. Surface and Interface Analysis. 25, 737-740 (1997).
- Peres, P., Merkulov, A., Choi, S. Y., Desse, F., Schuhmacher, M. Characterization of LED materials using dynamic SIMS. Surface and Interface Analysis. 45, 437-440 (2013).
- Arslan, I., Browning, N. D. Role of Oxygen at Screw Dislocations in GaN. Physical Review Letters. 91, 165501(2003).
- Hawkridge, M. E., Cherns, D. Oxygen segregation to dislocations in GaN. Applied Physics Letters. 87, 221903(2005).
- Arslan, I., Bleloch, A., Stach, E. A., Ogut, S., Browning, N. D. Using EELS to observe composition and electronic structure variations at dislocation cores in GaN. Philosophical Magazine. 86, 4727-4746 (2006).
- Hautakangas, S., et al. Gallium and nitrogen vacancies in GaN: Impurity decoration effects. Physica B: Condensed Matter. 376-377, 424-427 (2006).
- Michałowski, P. P., Złotnik, S., Rudziński, M. Three dimensional localization of unintentional oxygen impurities in gallium nitride. Chemical Communications. 55, 11539(2019).
- Kamler, G., Weyher, J. L., Grzegory, I., Jezierska, E., Wosiński, T. Defect-selective etching of GaN in a modified molten bases system. Journal of Crystal Growth. 246, 21-24 (2002).
- Zhuang, D., Edgar, J. H., Strojek, B., Chaudhuri, J., Rek, Z. Defect-selective etching of bulk AlN single crystals in molten KOH/NaOH eutectic alloy. Journal of Crystal Growth. 262, 89-94 (2004).
- SC-Ultra, User's Guide. , CAMECA. Gennerviliers. (2005).
- Weyher, J. vL., et al. Orthodox etching of HVPE-grown GaN. Journal of Crystal Growth. 305, 384-392 (2007).
Reimpressões e Permissões
Solicitar permissão para reutilizar o texto ou figuras deste artigo JoVE
Solicitar PermissãoExplore Mais Artigos
This article has been published
Video Coming Soon
Copyright © 2025 MyJoVE Corporation. Todos os direitos reservados