Method Article
Ricostruzione del profilo di profondità 3D di impurità segregate utilizzando la spettrometria di massa a ioni secondari
In questo articolo
Riepilogo
Il metodo presentato descrive come identificare e risolvere artefatti di misura relativi alla spettrometria di massa di ioni secondari e ottenere distribuzioni 3D realistiche di impurità/droganti nei materiali allo stato solido.
Abstract
Il protocollo presentato combina eccellenti limiti di rivelazione (da 1 ppm a 1 ppb) utilizzando la spettrometria di massa a ioni secondari (SIMS) con una ragionevole risoluzione spaziale (~1 μm). Inoltre, descrive come ottenere distribuzioni tridimensionali (3D) realistiche di impurità/droganti segregati nei materiali allo stato solido. La ricostruzione diretta del profilo di profondità 3D è spesso difficile da ottenere a causa di artefatti di misurazione correlati al SIMS. Di seguito viene presentato un metodo per identificare e risolvere questa sfida. Vengono discusse tre questioni principali, tra cui i) la non uniformità del rivelatore compensata dalla correzione del campo piatto; ii) il contributo di fondo del vuoto (conteggi parassiti dell'ossigeno dai gas residui presenti nella camera di analisi) viene stimato e sottratto; e iii) l'esecuzione di tutte le fasi entro un intervallo di tempo stabile della sorgente ionica primaria. L'incisione chimica a umido viene utilizzata per rivelare la posizione e i tipi di dislocazione in un materiale, quindi il risultato SIMS viene sovrapposto alle immagini ottenute tramite microscopia elettronica a scansione (SEM). Pertanto, la posizione delle impurità agglomerate può essere correlata alla posizione di alcuni difetti. Il metodo è veloce e non richiede una sofisticata fase di preparazione del campione; Tuttavia, richiede una sorgente di ioni stabile e di alta qualità e l'intera misurazione deve essere eseguita rapidamente per evitare il deterioramento dei parametri del fascio primario.
Introduzione
La spettrometria di massa a ioni secondari (SIMS) è una tecnica ben nota utilizzata per il monitoraggio della contaminazione con eccellenti limitidi rilevamento 1,2,3,4,5,6. Il contributo di fondo del vuoto può essere problematico per gli elementi leggeri (ad esempio, idrogeno, carbonio, azoto, ossigeno), che possono essere presenti sotto forma di gas residui in una camera di misura. Peres et al. hanno precedentemente stabilito una tecnica per stimare il contributo di fondo; In questo modo è possibile determinare una concentrazione realistica di atomi contaminanti7.
In molti materiali, la distribuzione degli atomi contaminanti non è uniforme. Il caso del nitruro di gallio (GaN) è particolarmente interessante, in quanto si prevede che l'ossigeno decori principalmente le dislocazioni a vite e miste 8,9,10,11. Considerando che la maggior parte dei metodi analitici manca di sensibilità o risoluzione spaziale per rilevare atomi contaminanti a bassa concentrazione, è essenziale sviluppare una procedura di misura SIMS in grado di localizzare in 3D le impurezze segregate12.
Sebbene molti spettrometri SIMS siano dotati di rivelatori sensibili alla posizione, una ricostruzione tridimensionale diretta (3D) di un profilo di profondità non è sufficiente per ottenere una distribuzione realistica degli atomi di ossigeno in un campione di GaN. L'imperfezione del rivelatore può distorcere l'immagine e impedire ai ricercatori di ottenere una distribuzione realistica degli atomi contaminanti. Tuttavia, un grosso problema è il contributo di fondo del vuoto, poiché di solito il >90% dei conteggi di ossigeno registrati proviene dai gas residui presenti nella camera di analisi. Di seguito viene presentato un metodo per identificare e risolvere adeguatamente ciascuna di queste sfide.
La non uniformità del rivelatore può essere testata su un wafer di silicio vuoto. Anche un lungo tempo di integrazione può portare all'osservazione di alcune non uniformità dell'immagine ionica secondaria, a causa della diversa sensibilità di ciascun canale in un rivelatore a piastre a microcanali. Pertanto, la correzione del campo piatto è necessaria per ottenere immagini di alta qualità delle distribuzioni 3D di atomi segregati.
Il contributo del fondo del vuoto è correlato a un flusso di atomi contaminanti dal vuoto adsorbito nell'area di analisi. Considerando che il processo è dinamico (cioè, la superficie del campione è costantemente farfugliata dal fascio primario), si può assumere che ogni punto dell'area analizzata abbia la stessa probabilità di adsorbire questi atomi di ossigeno. Inoltre, sono quasi immediatamente farfugliati e non hanno abbastanza tempo per segregarsi. Pertanto, un approccio statistico è il più efficiente. L'eliminazione casuale del 90% (o più) della conta dell'ossigeno dovrebbe rivelare le regioni in cui l'ossigeno è agglomerato.
Va notato che la stabilità del fascio primario è fondamentale per questo tipo di esperimento. Dopo un po' di tempo, l'intensità e l'omogeneità del fascio si deteriorano, riducendo la qualità dell'immagine. È quindi essenziale stimare un intervallo di tempo di funzionamento stabile del fascio ed eseguire tutti gli esperimenti prima che il fascio diventi instabile. Il protocollo può essere facilmente utilizzato per altri materiali e per rilevare elementi in cui è prevista una distribuzione non uniforme. È particolarmente interessante combinare questo con l'incisione chimica umida, che rivela le posizioni e i tipi di dislocazione. Pertanto, la posizione delle impurità agglomerate può essere correlata alla posizione dei difetti.
Protocollo
1. Incisione selettiva dei difetti
- Preparazione di mordenzanti solidi
- Preparare una miscela eutettica di basi forti di idrossido di potassio (KOH) e idrossido di sodio (NaOH), insieme a ossido di magnesio (MgO), sciogliendo e mescolando gli idrossidi alcalini che li compongono e l'ossido di metallo in acqua distillata. Mantenere quantità stechiometriche di 53,6/37,3/9,1 a % di NaOH, KOH e MgO, rispettivamente13. L'aggiunta di MgO aumenta la viscosità mordenzante in modo tale che rimanga sulla superficie Ga-polare e non fluisca oltre i bordi fino alla superficie N-polare13,14. Tutte le sostanze chimiche utilizzate dovrebbero essere di qualità pratica.
- Scaldare la miscela in un matraccio su una piastra calda a 200 °C e agitare agitando magneticamente per 1 ora (al di sopra del punto di fusione del punto eutettico KOH-NaOH).
- Raffreddare la miscela a ~100 °C riducendo la temperatura di una piastra riscaldante per far evaporare completamente il liquido rimanente. Questo passaggio dipende dalle dimensioni del pallone e dal volume dell'acqua, quindi potrebbe richiedere diversi minuti fino a 1 ora.
- Trasferire il mordenzante solido (indicato come E+M) in una bottiglia asciutta, evitando l'esposizione all'umidità.
ATTENZIONE: KOH e NaOH possono causare irritazioni cutanee e danni agli occhi. Lavora con guanti e occhiali. Il protocollo può anche essere messo in pausa qui.
- Mordenzatura selettiva dei difetti
- Preparare una superficie GaN pulita per l'analisi. Il GaN coltivato epitassialmente sullo zaffiro viene utilizzato nei seguenti passaggi12.
- Posizionare il campione di GaN su una piastra riscaldata a ~450 °C. Posizionare la termocoppia vicino al campione per leggere con precisione la temperatura reale.
- Mettere un pezzo di mordenzante solido E+M sopra il GaN e lasciare agire per 3 minuti.
- Prelevare il campione dalla piastra riscaldante e metterlo in un becher con HCl caldo per 3-5 minuti per eliminare E+M rimanente.
- Rimuovere il campione dall'HCl e inserirlo in un becher con acqua deionizzata (DI) e bagno ad ultrasuoni per 5-10 minuti.
- Asciugare il campione soffiando N2 .
ATTENZIONE: L'HCl può causare irritazioni cutanee e danni agli occhi. Lavora con guanti e occhiali. Evita di scottarti. Il protocollo può anche essere messo in pausa qui.
2. Osservazione al microscopio elettronico a scansione (SEM)
- Contrassegnare il campione (ad esempio, con un graffio a forma di L utilizzando un taglierino diamantato).
- Montare il campione su un tronchetto metallico dedicato al modello SEM da utilizzare, utilizzando un adesivo conduttivo (es. nastro biadesivo conduttivo in carbonio o materiale simile). Utilizzare i guanti durante la preparazione e il trasferimento del campione per evitare la contaminazione del grasso dalle mani.
- Aggiungere un pezzo del nastro del passaggio 2.2 per collegare la superficie del campione con un troncone di metallo per evitare l'accumulo di carica sulla superficie del campione. In alternativa, è possibile applicare un rivestimento sputtered con materiale conduttivo (~10 nm di spessore) per prevenire gli effetti di carica.
- Acquisire almeno tre micrografie SEM ad alta risoluzione (idealmente, un minimo di cinque) di una vista dall'alto del campione. Ogni immagine deve visualizzare un'area di almeno 25 x 25 μm. Evitare di acquisire immagini dalle regioni superficiali con difetti superficiali macroscopici. La Figura 1 presenta un risultato tipico.
- Annota la posizione esatta di ogni immagine rispetto all'indicatore a forma di L.
NOTA: Il protocollo può essere messo in pausa qui.
3. Misure di spettrometria di massa ionica secondaria
- Calibrazione dell'utensile
- Calibrare l'apparecchiatura SIMS utilizzando polarità negativa, ioni primari Cs con energia d'impatto di 7-13 keV. Allineare le travi secondaria e primaria. Mantenere il fascio il più piccolo possibile (almeno 1 μm di diametro), poiché la risoluzione laterale è predeterminata dalle dimensioni del raggio.
- Preparare cinque-sette impostazioni per fasci con varie densità di corrente ionica. Per semplicità, mantenere intatte le dimensioni del raggio e modificare la corrente del fascio. Misurare la corrente del fascio e le dimensioni del fascio15. Nei passaggi successivi, vengono utilizzate correnti del fascio di 5 nA, 10 nA, 15 nA, 20 nA, 30 nA e 50 nA e una dimensione dello spot di 1 μm.
- Utilizzare una dimensione raster di 50 x 50 μm e un'area di analisi di 35 x 35 μm per i passaggi seguenti. Scegli 256 x 256 pixel per la risoluzione spaziale. Se non diversamente specificato, utilizzare un tempo di integrazione standard per ciascun segnale (in genere 1-2 s).
- Stabilità della fonte primaria
- Scegliere un'impostazione con una corrente del fascio moderata (15-20 nA).
- Ottenere una serie di immagini utilizzando uno ione secondario 30Si2- per un wafer di silicio vuoto. Per ogni immagine, integrare il segnale per 5-10 min.
- Eseguire confronti pixel a pixel di tutte le immagini con la prima immagine. Se il >5% dei pixel mostra una differenza del >5% rispetto alla prima immagine, ciò indica che il raggio è diventato instabile. Notare l'intervallo di tempo della stabilità del raggio.
- Misurazione
NOTA: I seguenti passaggi vengono eseguiti entro un intervallo di tempo stabile del raggio.- Seguire la procedura descritta da Peres et al. per stimare il livello di fondo di contaminazione da ossigeno nella camera di misura7. Per ogni misurazione, non è necessario ottenere i valori assoluti della concentrazione di ossigeno, in quanto è sufficiente il rapporto di intensità di 16segnali O- e 69Ga-.
- Utilizzare le impostazioni del raggio preparate al punto 3.1.2. Eseguire almeno cinque misurazioni per ogni impostazione del raggio. Ottenere un profilo di profondità utilizzando 16ioni secondari O-, raggiungere una profondità di ~200 nm e misurare l'intensità dello ione secondario 69Ga- integrando il segnale per 10-15 s. Non eseguire questa operazione nelle regioni in cui sono state ottenute immagini SEM.
- Tracciare il rapporto di intensità dei segnali 16O- e 69Ga- in funzione della densità di corrente primaria inversa (non è necessario calcolare i valori assoluti). Ci si aspetta un buon adattamento lineare (in questo caso, R2 = 0,997). Stimare il contributo del fondo vuoto come mostrato nella Figura 2.
- Scegliere un fascio intenso (30 nA) per i passaggi successivi. Ottenere un'immagine che verrà utilizzata per la correzione del campo piatto. Utilizzare uno ione secondario 30Si2- per un wafer di silicio vuoto. Integrare il segnale per 5-10 min. La Figura 3 presenta un risultato tipico.
- Eseguire misurazioni del profilo di profondità nelle stesse regioni in cui sono state acquisite le immagini SEM. Utilizzando uno ione secondario 16O-, integrare il segnale per 3-5 s per ogni punto dati.
NOTA: Il protocollo può essere messo in pausa qui.
4. Trattamento dei dati
- Ricostruire un'immagine 3D da un profilo di profondità.
- Eseguire la correzione del campo piatto: normalizzare da pixel a pixel ogni immagine a 16ioni O- utilizzando un'immagine di riferimento ottenuta al punto 3.3.4. La Figura 4A presenta i dati grezzi e la Figura 4B presenta l'immagine dopo la correzione del campo piatto.
- Stimare il contributo del vuoto di fondo da un grafico ottenuto al punto 3.3.2. Non è necessario calcolare i valori assoluti; Tuttavia, si noti la percentuale specifica dei conteggi totali che può essere attribuita al contributo dello sfondo vuoto. Un valore compreso tra il 90 e il 95% è tipico per un esperimento di questo tipo.
- Sottrai il contributo di fondo del vuoto: elimina in modo casuale il 90-95% dei 16conteggi O- registrati. La Figura 4C presenta un risultato tipico per un singolo piano.
- Tracciare i conteggi rimanenti come un'immagine 3D. La Figura 5 presenta un risultato tipico.
- Integra i segnali provenienti da tutti i punti dati e sovrapponi l'immagine 2D all'immagine SEM ottenuta in precedenza utilizzando qualsiasi software di editor di immagini con supporto per i livelli. Considera l'immagine SEM come sfondo. Un livello contenente i risultati SIMS deve contenere solo i conteggi effettivi come pixel colorati (eliminare le aree bianche intermedie). Aggiungi ~30% di trasparenza a questo livello. La Figura 6 presenta un risultato tipico
Risultati
Nell'immagine 3D dovrebbero essere osservate strutture a forma di pilastro molto chiare. Più ossigeno dovrebbe essere agglomerato in una regione più vicina alla superficie, poiché il processo di mordenzatura introduce più ossigeno che può diffondersi attraverso il campione. La Figura 7 presenta un'immagine 3D dei dati grezzi e un'animazione di come la procedura di riduzione rivela il risultato finale. La Figura 4C presenta anche un risultato tipico per un singolo piano.
L'immagine SIMS sovrapposta all'immagine SEM rivela che l'ossigeno è agglomerato lungo i nuclei dei più grandi pozzi di incisione. Questi possono essere attribuiti a lussazioni miste/a vite15. Va notato che se il nucleo è più piccolo della dimensione di un raggio primario, l'immagine secondaria erediterà le dimensioni e la forma del fascio primario. Negli esperimenti subottimali, si può osservare una distribuzione casuale dei conteggi dell'ossigeno (Figura 8). La Figura 9 presenta una situazione in cui il fascio diventa instabile durante l'esperimento. In particolare, la qualità è alta per una regione così vicina alla superficie, ma si deteriora gradualmente durante l'esperimento.
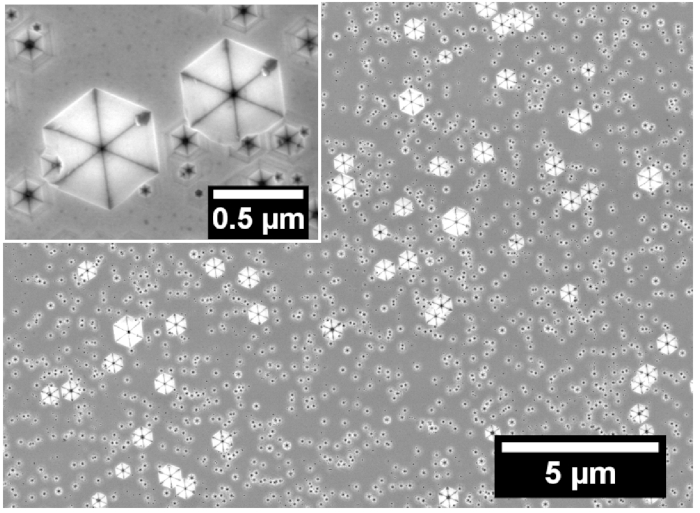
Figura 1: Micrografie SEM di pozzi di incisione rivelati sulla superficie del GaN utilizzando l'incisione E+M. I parametri di mordenzatura sono stati impostati a 450 °C per 3 minuti. L'inserto raffigura una micrografia ingrandita con fosse esagonali rivelate generate su nuclei di dislocazione. I due pozzi più grandi (>500 nm) rappresentano le dislocazioni con la componente della vite del vettore di Burgers. Questa figura è stata riprodotta con il permesso12. Fare clic qui per visualizzare una versione più grande di questa figura.

Figura 2: Concentrazione media di O- rispetto alla corrente primaria inversa. Il contributo dello sfondo del vuoto può essere stimato dal grafico. Le barre di errore rappresentano la deviazione standard di ciascun set di dati (cinque misurazioni). Fare clic qui per visualizzare una versione più grande di questa figura.
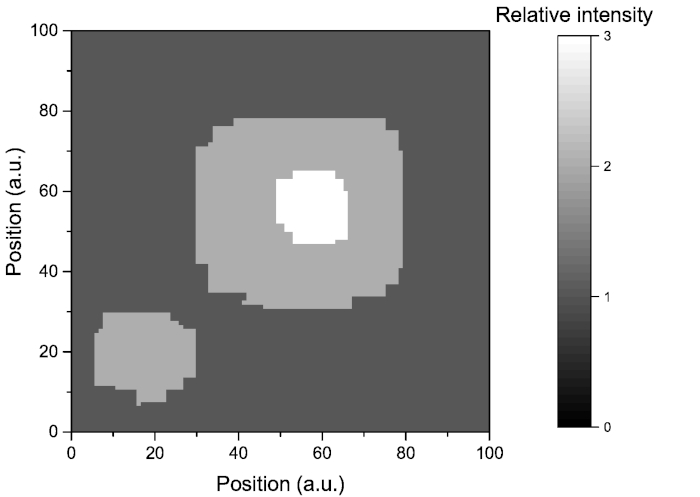
Figura 3: Una tipica immagine di ioni secondari 30Si2- per un wafer di silicio vuoto. Le differenze di intensità sono causate dalla non uniformità del rivelatore. Fare clic qui per visualizzare una versione più grande di questa figura.

Figura 4: Tipica vista piana della distribuzione dei conteggi dell'ossigeno misurata in modalità 3D. Vengono mostrate le immagini (A) dai dati grezzi, (B) dopo la correzione del campo piatto e (C) dopo la sottrazione del contributo di fondo del vuoto. Questa cifra è stata adattata con il permesso12. Fare clic qui per visualizzare una versione più grande di questa figura.

Figura 5: Vista 3D del conteggio dell'ossigeno in unparallelepipedo di 5 μ x 5 μ m x 1 μ m. Per una migliore visibilità, la scala z è allungata. Vedere la Figura 1 supplementare per l'animazione. Questa cifra è stata adattata con il permesso12. Fare clic qui per visualizzare una versione più grande di questa figura.

Figura 6: Distribuzione laterale degli ioni secondari di ossigeno (pixel blu) proiettata su micrografia SEM. Nonostante gli artefatti correlati al SIMS (risoluzione laterale determinata dalla dimensione del fascio primario), si osserva una chiara correlazione tra le posizioni dei pozzi più grandi e l'ossigeno. Questa cifra è stata adattata con il permesso12. Fare clic qui per visualizzare una versione più grande di questa figura.

Figura 7: Animazione che mostra come viene eseguita la procedura di riduzione. All'inizio della procedura, tutti i conteggi sono presenti, quindi per ogni strato, il 90% dei conteggi viene eliminato in modo casuale. Clicca qui per scaricare questa animazione.

Figura 8: Distribuzione casuale dei conteggi dell'ossigeno in un esperimento non ottimale. Fare clic qui per visualizzare una versione più grande di questa figura.

Figura 9: Esperimento eseguito con un fascio instabile. La qualità svanisce con la profondità dello sputtering. Fare clic qui per visualizzare una versione più grande di questa figura.
Figura supplementare 1. Clicca qui per scaricare questa figura.
Discussione
I problemi di non uniformità del rivelatore e del contributo del fondo vuoto sono facili da risolvere rispettivamente mediante correzione a campo piatto e sottrazione dei conteggi parassiti. La procedura di sottrazione non è perfetta, in quanto può sottrarre un contributo dove l'ossigeno è stato agglomato. Al contrario, nell'altra posizione, il conteggio in background rimarrà inalterato; Pertanto, alcuni conteggi artificiali possono essere ancora presenti mentre alcuni conteggi reali sono ridotti. Tuttavia, è abbastanza efficiente e sensibile da fornire risultati accettabili.
L'instabilità del fascio primario è la più problematica, in quanto il deterioramento dei parametri del fascio primario offuscherà l'immagine dello ione secondario; Pertanto, non è possibile ottenere informazioni affidabili sul campione. La sezione 3.2 del protocollo è particolarmente importante. Ad esempio, per un fascio ben allineato, la prima immagine di ioni secondari di 30Si2- riflette la non uniformità del rivelatore, ma dopo un po' di tempo, l'immagine inizierà a cambiare. Ciò è causato dal deterioramento dei parametri del fascio primario (ad esempio, perdita di corrente primaria, defocalizzazione, deriva della posizione, ecc.). È quindi importante stimare l'intervallo di tempo della stabilità del raggio. Si consiglia di iniziare l'esperimento 2-3 ore dopo l'inizializzazione del raggio, poiché in genere è più stabile.
Se l'esperimento viene eseguito entro un intervallo di tempo stabile del fascio e il risultato non è ancora soddisfacente, si consiglia di considerare la qualità del fascio primario. Per un fascio primario di piccole dimensioni, è più difficile confermare una qualità sufficiente osservando solo un'immagine di ioni secondari. Si consiglia quindi di eseguire prove di rugosità al microscopio a forza atomica sul fondo del cratere dopo lo sputtering di ~1 μm di un materiale molto piatto (cioè un wafer di silicio vuoto). Se la rugosità quadratica media è superiore a 1 nm, è necessaria un'ulteriore ottimizzazione del fascio primario.
La dimensione del fascio limita la risoluzione laterale di questo metodo. SIMS è in grado di visualizzare caratteristiche più piccole della dimensione del fascio, ma l'immagine dello ione secondario erediterà la forma e la dimensione del fascio di ioni primario. Se una distanza tra due caratteristiche è inferiore alla dimensione del raggio, l'immagine ionica secondaria le sfocerà insieme. Nonostante questi problemi, il metodo consente agli utenti di ottenere una distribuzione 3D realistica di impurità/droganti in campioni allo stato solido. Inoltre, qualsiasi segregazione spaziale degli atomi può essere correlata alla posizione dei difetti e delle interfacce.
Per le strutture a base di GaN (cioè decorate con ossigeno), le dislocazioni che agiscono come centri di ricombinazione locali non radiativi sono responsabili della conduttività di tipo n. Per altri materiali, qualsiasi disomogeneità nella distribuzione degli atomi droganti/contaminanti può avere un impatto importante sulle prestazioni di un dispositivo. Pertanto, il protocollo è particolarmente utile per l'analisi dei guasti e l'ottimizzazione delle procedure di crescita ed elaborazione.
Divulgazioni
Gli autori non hanno nulla da rivelare.
Riconoscimenti
Questo lavoro è stato parzialmente sostenuto dal National Science Centre (NCN) nell'ambito SONATA14 progetti 2018/31/D/ST5/00399 e OPUS10 2015/19/B/ST7/02163.
Materiali
| Name | Company | Catalog Number | Comments |
| Heating plate with ceramic top plate | IKA - Werke GmbH | 3644200 | for defect selective etching; yellow MAG HP 7 |
| Hydrochloric acid (HCl) solution 35-38% | Chempur | 115752837 | for etchant removal; pure p.a.; CAS: 7647-01-0 |
| Magnesium oxide (MgO) | Chempur | 116140200 | for eutectic solid etchant prepration; pure p.a.; CAS: 1309-48-4 |
| Potassium hydroxide (KOH) | POCH S.A. | 746800113 | for eutectic solid etchant prepration; pure p.a.; CAS: 1310-58-3 |
| Sodium hydroxide (NaOH) | POCH S.A. | 810925112 | for eutectic solid etchant prepration; pure p.a.; CAS: 1310-73-2 |
| Secondary ion mass spectrometer | CAMECA | IMS SC Ultra | |
| Scanning electron microscope | Hitachi | SU8230 |
Riferimenti
- Wittmaack, K. High-sensitivity depth profiling of arsenic and phosphorus in silicon by means of SIMS. Applied Physics Letters. 29, 552(1976).
- Ber, B. Y., et al. Secondary ion mass spectroscopy investigations of magnesium and carbon doped gallium nitride films grown by molecular beam epitaxy. Semiconductor Science and Technology. 13, 71-74 (1998).
- Chiou, C. Y., Wang, C. C., Ling, Y. C., Chiang, C. I. Secondary ion mass spectrometry analysis of In-doped p-type GaN films. Applied Surface Science. 203-204, 482-485 (2003).
- Emziane, M., Durose, K., Halliday, D. P., Bosio, A., Romeo, N. In situ oxygen incorporation and related issues in CdTe/CdS photovoltaic devices. Journal of Applied Physics. 100, 013513(2006).
- Matsunaga, T., Yoshikawa, S., Tsukamoto, K. Secondary ion yields of C, Si, Ge and Cs surface density and concentration in SIMS. Surface Science. 515, 390-402 (2002).
- Gnaser, H. SIMS detection in the 1012 atoms cm−3 range. Surface and Interface Analysis. 25, 737-740 (1997).
- Peres, P., Merkulov, A., Choi, S. Y., Desse, F., Schuhmacher, M. Characterization of LED materials using dynamic SIMS. Surface and Interface Analysis. 45, 437-440 (2013).
- Arslan, I., Browning, N. D. Role of Oxygen at Screw Dislocations in GaN. Physical Review Letters. 91, 165501(2003).
- Hawkridge, M. E., Cherns, D. Oxygen segregation to dislocations in GaN. Applied Physics Letters. 87, 221903(2005).
- Arslan, I., Bleloch, A., Stach, E. A., Ogut, S., Browning, N. D. Using EELS to observe composition and electronic structure variations at dislocation cores in GaN. Philosophical Magazine. 86, 4727-4746 (2006).
- Hautakangas, S., et al. Gallium and nitrogen vacancies in GaN: Impurity decoration effects. Physica B: Condensed Matter. 376-377, 424-427 (2006).
- Michałowski, P. P., Złotnik, S., Rudziński, M. Three dimensional localization of unintentional oxygen impurities in gallium nitride. Chemical Communications. 55, 11539(2019).
- Kamler, G., Weyher, J. L., Grzegory, I., Jezierska, E., Wosiński, T. Defect-selective etching of GaN in a modified molten bases system. Journal of Crystal Growth. 246, 21-24 (2002).
- Zhuang, D., Edgar, J. H., Strojek, B., Chaudhuri, J., Rek, Z. Defect-selective etching of bulk AlN single crystals in molten KOH/NaOH eutectic alloy. Journal of Crystal Growth. 262, 89-94 (2004).
- SC-Ultra, User's Guide. , CAMECA. Gennerviliers. (2005).
- Weyher, J. vL., et al. Orthodox etching of HVPE-grown GaN. Journal of Crystal Growth. 305, 384-392 (2007).
Ristampe e Autorizzazioni
Richiedi autorizzazione per utilizzare il testo o le figure di questo articolo JoVE
Richiedi AutorizzazioneEsplora altri articoli
This article has been published
Video Coming Soon