Method Article
İkincil İyon Kütle Spektrometrisi Kullanılarak Ayrılmış Safsızlıkların 3D Derinlik Profili Rekonstrüksiyonu
Bu Makalede
Özet
Sunulan yöntem, ikincil iyon kütle spektrometrisi ile ilgili ölçüm artefaktlarının nasıl tanımlanacağını ve çözüleceğini ve ayrıca katı hal malzemelerindeki safsızlıkların/katkı maddelerinin gerçekçi 3D dağılımlarının nasıl elde edileceğini açıklar.
Özet
Sunulan protokol, ikincil iyon kütle spektrometrisi (SIMS) kullanarak mükemmel algılama sınırlarını (1 ppm ila 1 ppb) makul uzamsal çözünürlükle (~1 μm) birleştirir. Ayrıca, katı hal malzemelerinde ayrılmış safsızlıkların/katkı maddelerinin gerçekçi üç boyutlu (3B) dağılımlarının nasıl elde edileceğini açıklar. SIMS ile ilgili ölçüm artefaktları nedeniyle doğrudan 3D derinlik profili rekonstrüksiyonunun elde edilmesi genellikle zordur. Burada sunulan, bu zorluğu tanımlamak ve çözmek için bir yöntemdir. Aşağıdakiler de dahil olmak üzere üç ana konu tartışılmaktadır: i) dedektörün düzgünsüzlüğü düz alan düzeltmesi ile telafi edilir; ii) vakum arka plan katkısı (analiz odasında bulunan artık gazlardan parazitik oksijen sayımı) tahmin edilir ve çıkarılır; ve iii) birincil iyon kaynağının kararlı bir zaman aralığı içinde tüm adımların performansı. Islak kimyasal aşındırma, bir malzemedeki çıkığın konumunu ve türlerini ortaya çıkarmak için kullanılır, daha sonra SIMS sonucu, taramalı elektron mikroskobu (SEM) ile elde edilen görüntülerin üzerine bindirilir. Bu nedenle, aglomera safsızlıkların konumu, belirli kusurların konumu ile ilişkilendirilebilir. Yöntem hızlıdır ve karmaşık numune hazırlama aşaması gerektirmez; Bununla birlikte, yüksek kaliteli, kararlı bir iyon kaynağı gerektirir ve birincil ışın parametrelerinin bozulmasını önlemek için tüm ölçümün hızlı bir şekilde yapılması gerekir.
Giriş
İkincil iyon kütle spektrometrisi (SIMS), mükemmel tespit limitleri 1,2,3,4,5,6 ile kontaminasyon izleme için kullanılan iyi bilinen bir tekniktir. Vakum arka plan katkısı, bir ölçüm odasında artık gazlar şeklinde bulunabilen hafif elementler (örn. hidrojen, karbon, nitrojen, oksijen) için sorunlu olabilir. Peres ve ark. daha önce arka plan katkısını tahmin etmek için bir teknik oluşturmuştu; Böylece, kirletici atomların gerçekçi bir konsantrasyonu belirlenebilir7.
Birçok malzemede, kirletici atomların dağılımı tekdüze değildir. Galyum nitrür (GaN) durumu özellikle ilginçtir, çünkü oksijenin esas olarak vida ve karışık çıkıklarısüslediği tahmin edilmektedir 8,9,10,11. Çoğu analitik yöntemin, düşük konsantrasyonlu kirletici atomları tespit etmek için hassasiyet veya uzamsal çözünürlükten yoksun olduğu göz önüne alındığında, ayrılmış safsızlıkların 3D lokalizasyonunu yapabilen bir SIMS ölçüm prosedürü geliştirmek esastır12.
Birçok SIMS spektrometresi konuma duyarlı dedektörlerle donatılmış olsa da, bir derinlik profilinin doğrudan üç boyutlu (3D) rekonstrüksiyonu, bir GaN örneğinde oksijen atomlarının gerçekçi dağılımını elde etmek için yetersizdir. Dedektörün kusuru görüntüyü bozabilir ve araştırmacıların kirletici atomların gerçekçi bir dağılımını elde etmelerini engelleyebilir. Bununla birlikte, kayıtlı oksijen sayımlarının genellikle %>90'ı analiz odasında bulunan artık gazlardan kaynaklandığından, büyük bir sorun vakum arka plan katkısıdır. Burada, bu zorlukların her birini tanımlamak ve uygun şekilde çözmek için bir yöntem sunulmaktadır.
Dedektörün düzensizliği boş bir silikon gofret üzerinde test edilebilir. Uzun bir entegrasyon süresi bile, bir mikrokanal plaka dedektöründeki her kanalın değişen hassasiyeti nedeniyle bazı ikincil iyon görüntüsü düzensizliklerinin gözlemlenmesine yol açabilir. Bu nedenle, ayrılmış atomların 3D dağılımlarının yüksek kaliteli görüntülerini elde etmek için düz alan düzeltmesi gereklidir.
Vakum arka plan katkısı, analiz alanına adsorbe edilen vakumdan kirletici atomların akışı ile ilgilidir. İşlemin dinamik olduğu göz önüne alındığında (yani, numune yüzeyi sürekli olarak birincil ışın tarafından püskürtülür), analiz edilen alanın her noktasının bu oksijen atomlarını adsorbe etme olasılığının aynı olduğu varsayılabilir. Ayrıca, neredeyse anında püskürtülürler ve ayrılmak için yeterli zamanları yoktur. Bu nedenle, istatistiksel bir yaklaşım en verimli olanıdır. Oksijen sayımlarının %90'ının (veya daha fazlasının) rastgele ortadan kaldırılması, oksijenin topaklandığı bölgeleri ortaya çıkarmalıdır.
Birincil ışının stabilitesinin bu tür bir deney için çok önemli olduğuna dikkat edilmelidir. Bir süre sonra, ışının yoğunluğu ve homojenliği bozulur ve bu da görüntünün kalitesini düşürür. Bu nedenle, ışının kararlı çalışmasının bir zaman aralığını tahmin etmek ve ışın kararsız hale gelmeden önce tüm deneyleri yapmak önemlidir. Protokol, düzgün olmayan dağılımın beklendiği diğer malzemeler ve tespit edilen elemanlar için kolayca kullanılabilir. Bunu, çıkığın konumlarını ve türlerini ortaya çıkaran ıslak kimyasal aşındırma ile birleştirmek özellikle ilginçtir. Böylece, aglomera safsızlıkların konumu, kusurların konumu ile ilişkilendirilebilir.
Protokol
1. Kusur seçici aşındırma
- Katı aşındırıcı hazırlama
- Potasyum hidroksit (KOH) ve sodyum hidroksitin (NaOH) güçlü bazlarının ötektik karışımını, magnezyum oksit (MgO) ile birlikte, oluşturan alkali hidroksitleri ve metal oksidi damıtılmış suda çözerek ve karıştırarak hazırlayın. 53.6/37.3/9.1 stokiyometrik miktarları sırasıyla NaOH, KOH ve MgO'nun %'sinde tutun 13. MgO ilavesi, aşındırıcı viskoziteyi, Ga-polar yüzeyde kalacak ve kenarlardan N-polar yüzeyeakmayacak şekilde arttırır 13,14. Kullanılan tüm kimyasallar pratik kalitede olmalıdır.
- Karışımı bir şişede sıcak bir plaka üzerinde 200 °C'ye ısıtın ve 1 saat boyunca manyetik karıştırarak çalkalayın (KOH-NaOH ötektik noktasının erime noktasının üzerinde).
- Kalan sıvıyı tamamen buharlaştırmak için bir sıcak plakanın sıcaklığını düşürerek karışımı ~100 °C'ye soğutun. Bu adım, şişe boyutuna ve su hacmine bağlıdır, bu nedenle 1 saate kadar birkaç dakika sürebilir.
- Katı dağlayıcıyı (E+M olarak gösterilir) neme maruz kalmaktan kaçınarak kurutulmuş bir şişeye aktarın.
DİKKAT: KOH ve NaOH cilt tahrişine ve göz hasarına neden olabilir. Eldiven ve gözlük ile çalışın. Protokol burada da duraklatılabilir.
- Kusur seçici aşındırma
- Analiz için temiz bir GaN yüzeyi hazırlayın. Safir üzerinde epitaksiyal olarak büyütülen GaN aşağıdaki adımlarda kullanılır12.
- GaN örneğini ~450 °C'ye ısıtılmış bir sıcak plaka üzerine yerleştirin. Gerçek sıcaklığı tam olarak okumak için termokupl'u numunenin yakınına yerleştirin.
- GaN'nin üzerine bir parça katı E+M aşındırıcı yerleştirin ve 3 dakika bekletin.
- Numuneyi sıcak plakadan alın ve kalan E+M'yi ortadan kaldırmak için 3-5 dakika sıcak HCl içeren bir behere koyun.
- Numuneyi HCl'den çıkarın ve 5-10 dakika boyunca deiyonize (DI) su ve ultrasonik banyo ile bir behere yerleştirin.
- NumuneyiN2 üfleyerek kurutun.
DİKKAT: HCl cilt tahrişine ve göz hasarına neden olabilir. Eldiven ve gözlük ile çalışın. Yanmaktan kaçının. Protokol burada da duraklatılabilir.
2. Taramalı elektron mikroskobu (SEM) gözlemi
- Numuneyi işaretleyin (örneğin, bir elmas kalem kesici kullanarak L şeklinde bir çizik ile).
- Numuneyi, iletken bir yapıştırıcı (yani çift taraflı karbon iletken bant veya benzeri bir malzeme) kullanarak kullanılacak SEM modeline ayrılmış metal bir saplama üzerine monte edin. Ellerden yağ kontaminasyonunu önlemek için numune hazırlama ve aktarma sırasında eldiven kullanın.
- Numune yüzeyinde yük birikmesini önlemek için numune yüzeyini metal bir saplama ile bağlamak için adım 2.2'den bir parça bant ekleyin. Alternatif olarak, şarj etkilerini önlemek için iletken malzeme (~ 10 nm kalınlığında) ile püskürtülmüş bir kaplama uygulanabilir.
- Numunenin üstten görünümünün en az üç yüksek çözünürlüklü SEM mikrografını (ideal olarak en az beş) edinin. Her görüntü en az 25 x 25 μm'lik bir alan göstermelidir. Makroskopik yüzey kusurları olan yüzey bölgelerinden görüntü almaktan kaçının. Şekil 1 tipik bir sonuç sunmaktadır.
- L şeklindeki işaretleyiciye göre her resmin tam konumunu not edin.
NOT: Protokol burada duraklatılabilir.
3. İkincil iyon kütle spektrometrisi ölçümleri
- Alet kalibrasyonu
- SIMS ekipmanını negatif polarite, 7-13 keV darbe enerjisine sahip Cs birincil iyonları kullanarak kalibre edin. İkincil ve birincil kirişleri hizalayın. Yanal çözünürlük ışının boyutuna göre önceden belirlendiğinden, ışını mümkün olduğunca küçük tutun (çapı en az 1 μm).
- Çeşitli iyon akımı yoğunluğuna sahip kirişler için beş-yedi ayar hazırlayın. Basitlik için, ışının boyutunu sağlam tutun ve ışın akımını değiştirin. Işın akımını ve ışının boyutunuölçün 15. Aşağıdaki adımlarda 5 nA, 10 nA, 15 nA, 20 nA, 30 nA ve 50 nA ışın akımları ve 1 μm spot boyutu kullanılır.
- Aşağıdaki adımlar için 50 x 50 μm raster boyutu ve 35 x 35 μm analiz alanı kullanın. Uzamsal çözünürlük için 256 x 256 pikseli seçin. Aksi belirtilmedikçe, her sinyal için standart bir entegrasyon süresi kullanın (tipik olarak 1-2 s).
- Birincil kaynak kararlılığı
- Orta ışın akımına (15-20 nA) sahip bir ayar seçin.
- Boş bir silikon gofret için 30Si2- ikincil iyon kullanarak bir dizi görüntü elde edin. Her görüntü için sinyali 5-10 dakika boyunca entegre edin.
- İlk görüntüyle tüm görüntülerin pikselden piksele karşılaştırmalarını gerçekleştirin. Piksellerin %>5'i ilk görüntüden %>5'lik bir fark gösteriyorsa, bu, ışının kararsız hale geldiğini gösterir. Işın kararlılığının zaman aralığına dikkat edin.
- Ölçüm
NOT: Aşağıdaki adımlar, ışının sabit bir zaman aralığı içinde gerçekleştirilir.- Ölçüm odasındaki7. oksijen kirliliğinin arka plan seviyesini tahmin etmek için Peres ve ark. tarafından açıklanan prosedürü izleyin. Her ölçüm için, 16O- ve 69Ga- sinyalinin yoğunluk oranı yeterli olduğundan, oksijen konsantrasyonunun mutlak değerlerini elde etmeye gerek yoktur.
- Adım 3.1.2'de hazırlanan ışın ayarlarını kullanın. Her ışın ayarı için en az beş ölçüm gerçekleştirin. 16O- ikincil iyon kullanarak bir derinlik profili elde edin, ~200 nm derinliğe ulaşın ve sinyali 10-15 saniye boyunca entegre ederek 69Ga- ikincil iyonun yoğunluğunu ölçün. SEM görüntülerinin elde edildiği bölgelerde bunu yapmayın.
- 16O- ve 69Ga- sinyallerinin yoğunluk oranını, ters birincil akım yoğunluğunun bir fonksiyonu olarak çizin (mutlak değerleri hesaplamaya gerek yoktur). İyi bir doğrusal uyum beklenir (burada,R2 = 0.997). Şekil 2'de gösterildiği gibi vakum arka plan katkısını tahmin edin.
- Aşağıdaki adımlar için yoğun bir ışın (30 nA) seçin. Düz alan düzeltmesi için kullanılacak bir görüntü elde edin. Boş bir silikon gofret için 30Si2- ikincil iyon kullanın. Sinyali 5-10 dakika boyunca entegre edin. Şekil 3 tipik bir sonuç sunmaktadır.
- SEM görüntülerinin elde edildiği bölgelerde derinlik profili ölçümleri gerçekleştirin. 16 O-ikincil iyon kullanarak, her veri noktası için sinyali 3-5 saniye boyunca entegre edin.
NOT: Protokol burada duraklatılabilir.
4. Veri işleme
- Derinlik profilinden bir 3D görüntüyü yeniden oluşturun.
- Düz alan düzeltmesi gerçekleştirin: adım 3.3.4'te elde edilen bir referans görüntü kullanarak her 16 O-ion görüntüsünü pikselden piksele normalleştirin. Şekil 4A , ham verileri sunar ve Şekil 4B , düz alan düzeltmesinden sonraki görüntüyü sunar.
- Adım 3.3.2'de elde edilen bir çizimden vakum arka plan katkısını tahmin edin. Mutlak değerleri hesaplamaya gerek yoktur; Ancak, vakum arka plan katkısına atfedilebilecek toplam sayımların belirli yüzdesine dikkat edin. Böyle bir deney için %90-95 arasında bir değer tipiktir.
- Vakum arka plan katkısını çıkarın: kayıtlı 16 O sayımının %90-95'ini rastgele ortadan kaldırın. Şekil 4C , tek bir düzlem için tipik bir sonuç sunar.
- Kalan sayıları 3D görüntü olarak çizin. Şekil 5 tipik bir sonuç sunmaktadır.
- Tüm veri noktalarından gelen sinyalleri entegre edin ve katman destekli herhangi bir görüntü düzenleme yazılımını kullanarak 2D görüntüyü önceden elde edilen SEM görüntüsünün üzerine yerleştirin. SEM görüntüsünü arka plan olarak değerlendirin. SIMS sonuçlarını içeren bir katman, yalnızca renkli pikseller olarak gerçek sayıları içermelidir (aradaki beyaz bölgeleri silin). Bu katmana ~%30 saydamlık ekleyin. Şekil 6 tipik bir sonuç sunmaktadır
Sonuçlar
3D görüntüde çok net sütun şeklindeki yapılar gözlemlenmelidir. Yüzeye daha yakın bir bölgede daha fazla oksijen toplanmalıdır, çünkü aşındırma işlemi numune boyunca yayılabilecek daha fazla oksijen sağlar. Şekil 7 , ham verilerin 3B görüntüsünü ve azaltma prosedürünün nihai sonucu nasıl ortaya çıkardığının bir animasyonunu sunar. Şekil 4C ayrıca tek bir düzlem için tipik bir sonuç sunar.
SEM görüntüsünün üzerine bindirilmiş SIMS görüntüsü, oksijenin en büyük aşındırma çukurlarının çekirdekleri boyunca toplandığını ortaya koymaktadır. Bunlar karışık/vidalı çıkıklarabağlanabilir 15. Çekirdek, birincil ışının boyutundan daha küçükse, ikincil görüntünün birincil ışının boyutunu ve şeklini devralacağına dikkat edilmelidir. Optimal olmayan deneylerde, oksijen sayımlarının rastgele bir dağılımı görülebilir (Şekil 8). Şekil 9 , deney sırasında ışının kararsız hale geldiği bir durumu göstermektedir. Spesifik olarak, yüzeye çok yakın bir bölge için kalite yüksektir, ancak deney sırasında yavaş yavaş bozulur.
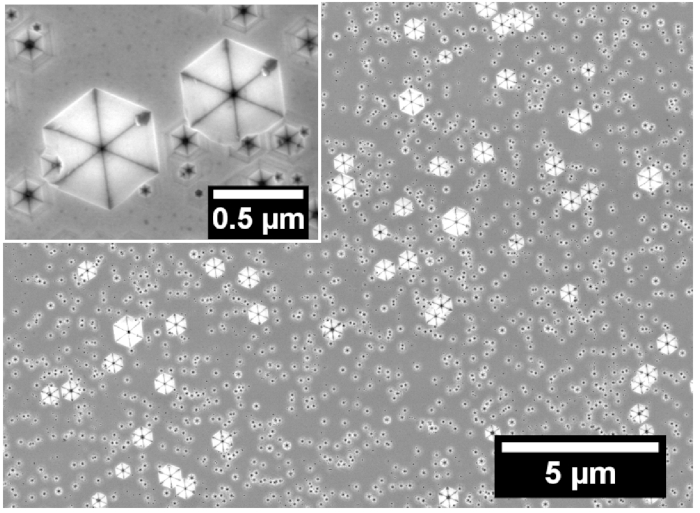
Şekil 1: E+M aşındırma kullanılarak GaN yüzeyinde ortaya çıkarılan aşındırma çukurlarının SEM mikrografları. Aşındırma parametreleri 3 dakika boyunca 450 oC'ye ayarlandı. İç kısım, çıkık çekirdekleri üzerinde oluşan altıgen çukurların ortaya çıktığı büyütülmüş bir mikrografı tasvir ediyor. En büyük iki çukur (>500 nm), Burgers vektörünün vida bileşeni ile çıkıkları temsil eder. Bu rakam12 izni ile çoğaltılmıştır. Bu rakamın daha büyük bir sürümünü görüntülemek için lütfen buraya tıklayın.

Şekil 2: Ortalama O- konsantrasyonu ve ters birincil akım. Vakum arka plan katkısı arsadan tahmin edilebilir. Hata çubukları, her veri kümesinin standart sapmasını temsil eder (beş ölçüm). Bu rakamın daha büyük bir sürümünü görüntülemek için lütfen buraya tıklayın.
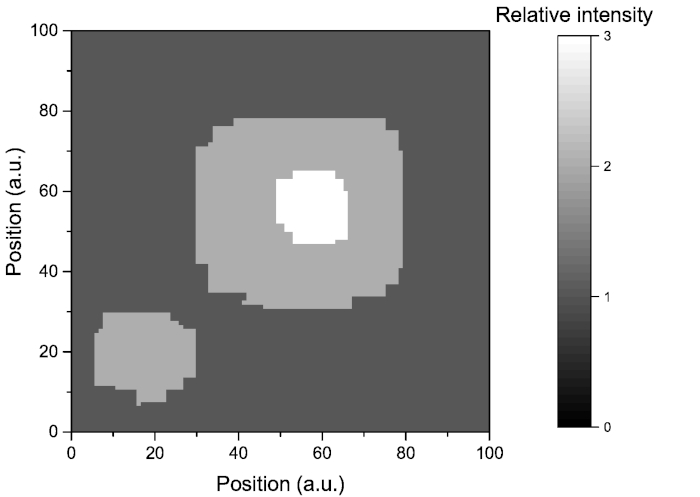
Şekil 3: Boş bir silikon gofret için tipik bir 30Si2- ikincil iyon görüntüsü.Yoğunluk farklılıkları, dedektörün düzensizliğinden kaynaklanır. Bu rakamın daha büyük bir sürümünü görüntülemek için lütfen buraya tıklayın.

Şekil 4: 3D modunda ölçülen oksijen sayımı dağılımının tipik düzlem görünümü. Ham verilerden (A), (B) düz alan düzeltmesinden sonra ve (C) vakum arka plan katkısının çıkarılmasından sonraki görüntüler gösterilmiştir. Bu rakam12 izni ile uyarlanmıştır. Bu rakamın daha büyük bir sürümünü görüntülemek için lütfen buraya tıklayın.

Şekil 5: 5 μ m x 5 μ m x 1 μm küboiddeki oksijen sayımlarının 3 boyutlu görünümü. Daha iyi görünürlük için z ölçeği uzatılmıştır. Animasyon için Ek Şekil 1'e bakın. Bu rakam12 izni ile uyarlanmıştır. Bu rakamın daha büyük bir sürümünü görüntülemek için lütfen buraya tıklayın.

Şekil 6: SEM mikrografına yansıtılan oksijen ikincil iyonlarının (mavi pikseller) yanal dağılımı. SIMS ile ilgili artefaktlara rağmen (birincil ışının boyutuna göre belirlenen yanal çözünürlük), en büyük çukurların konumları ile oksijen arasında açık bir korelasyon gözlenir. Bu rakam12 izni ile uyarlanmıştır. Bu rakamın daha büyük bir sürümünü görüntülemek için lütfen buraya tıklayın.

Şekil 7: Redüksiyon prosedürünün nasıl yapıldığını gösteren animasyon. Prosedürün başlangıcında, tüm sayımlar mevcuttur, daha sonra her katman için sayımların% 90'ı rastgele elimine edilir. Bu animasyonu indirmek için lütfen buraya tıklayın.

Şekil 8: Suboptimal deneyde oksijen sayımlarının rastgele dağılımı. Bu rakamın daha büyük bir sürümünü görüntülemek için lütfen buraya tıklayın.

Şekil 9: Kararsız bir ışınla gerçekleştirilen deney. Püskürtme derinliği ile kalite düşer. Bu rakamın daha büyük bir sürümünü görüntülemek için lütfen buraya tıklayın.
Ek Şekil 1. Bu rakamı indirmek için lütfen buraya tıklayın.
Tartışmalar
Dedektörün düzensizliği ve vakum arka plan katkısı sorunlarının, sırasıyla düz alan düzeltmesi ve parazitik sayımların çıkarılması ile çözülmesi kolaydır. Çıkarma prosedürü mükemmel değildir, çünkü oksijenin toplandığı bir katkıyı çıkarabilir. Buna karşılık, diğer konumda, arka plan sayısını etkilemeyecektir; Bu nedenle, bazı gerçek sayımlar azalırken bazı yapay sayımlar hala mevcut olabilir. Bununla birlikte, kabul edilebilir sonuçlar sağlayacak kadar verimli ve hassastır.
Birincil ışın kararsızlığı en sorunlu olanıdır, çünkü birincil ışın parametrelerinin bozulması ikincil iyon görüntüsünü bulanıklaştıracaktır; Böylece numune hakkında sağlıklı bir bilgi elde edilemez. Protokoldeki Bölüm 3.2 özellikle önemlidir. Örneğin, iyi hizalanmış bir ışın için, ilk 30Si2- ikincil iyon görüntüsü dedektörün düzensizliğini yansıtır, ancak bir süre sonra görüntü değişmeye başlayacaktır. Bu, birincil ışın parametrelerinin bozulmasından kaynaklanır (yani, birincil akım kaybı, odak kaybı, konum kayması vb.). Bu nedenle, ışın kararlılığının zaman aralığını tahmin etmek önemlidir. Tipik olarak daha kararlı olduğu için, ışının başlatılmasından 2-3 saat sonra deneye başlanması tavsiye edilir.
Deney, ışının sabit bir zaman aralığı içinde gerçekleştirilirse ve sonuç hala tatmin edici değilse, birincil ışının kalitesinin dikkate alınması tavsiye edilir. Küçük bir birincil ışın için, yalnızca ikincil bir iyon görüntüsünü gözlemleyerek yeterli kaliteyi doğrulamak daha zordur. Bu nedenle, çok düz bir malzemenin (yani boş bir silikon gofret) ~ 1 μm püskürtüldükten sonra krater tabanında atomik kuvvet mikroskobu pürüzlülük testlerinin yapılması tavsiye edilir. Kök ortalama kare pürüzlülüğü 1 nm'nin üzerindeyse, birincil ışının daha fazla optimizasyonu gerekir.
Işının boyutu, bu yöntemin yanal çözünürlüğünü sınırlar. SIMS, ışın boyutundan daha küçük özellikleri görüntüleyebilir, ancak ikincil iyon görüntüsü, birincil iyon ışınının şeklini ve boyutunu devralır. İki özellik arasındaki mesafe ışının boyutundan daha küçükse, ikincil iyon görüntüsü bunları birlikte bulanıklaştıracaktır. Bu sorunlara rağmen, yöntem, kullanıcıların katı hal örneklerinde safsızlıkların/katkı maddelerinin gerçekçi bir 3D dağılımını elde etmelerini sağlar. Ayrıca, atomların herhangi bir uzamsal ayrışması, kusurların ve arayüzlerin konumu ile ilişkilendirilebilir.
GaN bazlı yapılar için (yani, oksijenle süslenmiş), yerel ışınımsal olmayan rekombinasyon merkezleri olarak hareket eden çıkıklar, n-tipi iletkenlikten sorumludur. Diğer malzemeler için, katkı maddesi/kirletici atom dağılımının herhangi bir homojen olmaması, bir cihazın performansı üzerinde büyük etkilere sahip olabilir. Bu nedenle, protokol özellikle arıza analizi ve büyüme ve işleme prosedürlerinin optimizasyonu için kullanışlıdır.
Açıklamalar
Yazarların açıklayacak hiçbir şeyi yok.
Teşekkürler
Bu çalışma, SONATA14 2018/31/D/ST5/00399 ve OPUS10 2015/19/B/ST7/02163 projeleri kapsamında Ulusal Bilim Merkezi (NCN) tarafından kısmen desteklenmiştir.
Malzemeler
| Name | Company | Catalog Number | Comments |
| Heating plate with ceramic top plate | IKA - Werke GmbH | 3644200 | for defect selective etching; yellow MAG HP 7 |
| Hydrochloric acid (HCl) solution 35-38% | Chempur | 115752837 | for etchant removal; pure p.a.; CAS: 7647-01-0 |
| Magnesium oxide (MgO) | Chempur | 116140200 | for eutectic solid etchant prepration; pure p.a.; CAS: 1309-48-4 |
| Potassium hydroxide (KOH) | POCH S.A. | 746800113 | for eutectic solid etchant prepration; pure p.a.; CAS: 1310-58-3 |
| Sodium hydroxide (NaOH) | POCH S.A. | 810925112 | for eutectic solid etchant prepration; pure p.a.; CAS: 1310-73-2 |
| Secondary ion mass spectrometer | CAMECA | IMS SC Ultra | |
| Scanning electron microscope | Hitachi | SU8230 |
Referanslar
- Wittmaack, K. High-sensitivity depth profiling of arsenic and phosphorus in silicon by means of SIMS. Applied Physics Letters. 29, 552 (1976).
- Ber, B. Y., et al. Secondary ion mass spectroscopy investigations of magnesium and carbon doped gallium nitride films grown by molecular beam epitaxy. Semiconductor Science and Technology. 13, 71-74 (1998).
- Chiou, C. Y., Wang, C. C., Ling, Y. C., Chiang, C. I. Secondary ion mass spectrometry analysis of In-doped p-type GaN films. Applied Surface Science. 203-204, 482-485 (2003).
- Emziane, M., Durose, K., Halliday, D. P., Bosio, A., Romeo, N. In situ oxygen incorporation and related issues in CdTe/CdS photovoltaic devices. Journal of Applied Physics. 100, 013513 (2006).
- Matsunaga, T., Yoshikawa, S., Tsukamoto, K. Secondary ion yields of C, Si, Ge and Cs surface density and concentration in SIMS. Surface Science. 515, 390-402 (2002).
- Gnaser, H. SIMS detection in the 1012 atoms cm−3 range. Surface and Interface Analysis. 25, 737-740 (1997).
- Peres, P., Merkulov, A., Choi, S. Y., Desse, F., Schuhmacher, M. Characterization of LED materials using dynamic SIMS. Surface and Interface Analysis. 45, 437-440 (2013).
- Arslan, I., Browning, N. D. Role of Oxygen at Screw Dislocations in GaN. Physical Review Letters. 91, 165501 (2003).
- Hawkridge, M. E., Cherns, D. Oxygen segregation to dislocations in GaN. Applied Physics Letters. 87, 221903 (2005).
- Arslan, I., Bleloch, A., Stach, E. A., Ogut, S., Browning, N. D. Using EELS to observe composition and electronic structure variations at dislocation cores in GaN. Philosophical Magazine. 86, 4727-4746 (2006).
- Hautakangas, S., et al. Gallium and nitrogen vacancies in GaN: Impurity decoration effects. Physica B: Condensed Matter. 376-377, 424-427 (2006).
- Michałowski, P. P., Złotnik, S., Rudziński, M. Three dimensional localization of unintentional oxygen impurities in gallium nitride. Chemical Communications. 55, 11539 (2019).
- Kamler, G., Weyher, J. L., Grzegory, I., Jezierska, E., Wosiński, T. Defect-selective etching of GaN in a modified molten bases system. Journal of Crystal Growth. 246, 21-24 (2002).
- Zhuang, D., Edgar, J. H., Strojek, B., Chaudhuri, J., Rek, Z. Defect-selective etching of bulk AlN single crystals in molten KOH/NaOH eutectic alloy. Journal of Crystal Growth. 262, 89-94 (2004).
- . . SC-Ultra, User's Guide. , (2005).
- Weyher, J. v. L., et al. Orthodox etching of HVPE-grown GaN. Journal of Crystal Growth. 305, 384-392 (2007).
Yeniden Basımlar ve İzinler
Bu JoVE makalesinin metnini veya resimlerini yeniden kullanma izni talebi
Izin talebiDaha Fazla Makale Keşfet
This article has been published
Video Coming Soon
JoVE Hakkında
Telif Hakkı © 2020 MyJove Corporation. Tüm hakları saklıdır