Method Article
에 대한 소설 방법
요약
전기적 보조 변형 (EAD)에 대한 전기 및 열 영향을 분리하는 것은 거시적 인 샘플을 사용하여 매우 어렵습니다. 금속 샘플 마이크로 및 나노 구조와 함께 커스텀 테스트 절차가 개발되어이 샘플에서 주울 가열 및 전위 전개없이 형성에인가 된 전류의 영향을 평가했습니다.
초록
판금 압연 및 단조와 같은 공정 중에 금속의 성형 성을 개선하기 위해 EAD (Electrically assisted deformation)가 점점 더 많이 사용되고 있습니다. 이 기술의 채택은 EAD를 담당하는 기저의 메커니즘에 관한 의견 불일치에도 불구하고 진행되고있다. 여기에 설명 된 실험 절차는 이전 EAD 결과를 해석 할 때 불일치를 초래하는 열 영향을 제거하여 이전 EAD 연구와 비교하여보다 명확한 연구를 가능하게합니다. 또한, 여기에 설명 된 절차는 전송 전자 현미경 (TEM) 에서 현장 및 실시간으로 EAD 관찰 을 가능하게하므로 EAD 효과 후 검사를 관찰하는 기존의 사후 방법보다 우수합니다. 시험 샘플은 레이저와 이온빔 밀링의 조합을 사용하여 제조 된 나노 스케일 두께의 자립 인장 시험 부분을 갖는 단결정 구리 (SCC) 호일로 구성됩니다. SCC는 에칭 된 실리콘베이스에 장착되어 나를 제공합니다.(chanical) 지원 및 전기적 절연 (heat isolation)을 제공합니다. 이 지오메트리를 사용하여 높은 전류 밀도 (~ 3,500 A / mm2)에서도 테스트 섹션은 무시할 수있는 온도 상승 (<0.02 ° C)을 경험하므로 줄 가열 효과가 제거됩니다. 재료 변형을 모니터링하고 미세 구조에 해당하는 변화, 예를 들어 전위를 확인하는 것은 일련의 TEM 이미지를 수집하고 분석하여 수행됩니다. 우리의 샘플 준비 및 현장 실험 절차는 단단 및 다결정 구리와 같은 다양한 미세 구조를 가진 재료를 쉽게 테스트 할 수 있기 때문에 강력하고 다양합니다.
서문
전기 보조 변형 (EAD)은 단조, 스탬핑, 압출 등과 같은 금속 변형 공정에 유용한 도구입니다. EAD 공정은 변형 중에 금속 가공물에 전류를 적용하고, 유동 응력을 줄임으로써 변형률을 줄임으로써 금속 성형 성을 크게 개선하고 , 1 , 2 , 3을 성형 한 후 스프링 백을 제거하는 작업을 포함합니다. 사용의 성장에도 불구하고, EAD가 금속 성형 성을 향상시키는 메커니즘에 관한 합의가 없습니다. 이 백서에서는 잠재적으로 경쟁하는 EAD 메커니즘을 격리하고 테스트 중에 현장 미세 구조 검사를 수행 할 수 있는 실험을위한 샘플 준비 및 테스트 절차에 대해 설명합니다.
EAD가 금속 형성에 미치는 영향에는 두 가지 가설이 있습니다. 첫 번째 가설, 주울 가열 효과, 역적용된 전류가 성형 금속에서 전기 저항을 만나 온도가 상승하고 물질의 연화 및 팽창을 일으킨다는 사실을 말해 준다. 두 번째 가설은 전위가 활성화 에너지를 낮춤으로써 전류가 변형을 일으키는 전기 변성이라고 불린다. 이 두 가설은 기계적으로 변형되는 금속 4 , 5 에 적용되는 짧은 지속 전류 펄스와 관련된 1970 년대의 실험에서 나왔다. 보다 최근의 연구는 일반적으로 제조 암페어와 관련성이있는 저 전류 DC 펄스를 포함하지만 연구원들은 EAD 데이터의 해석에 계속해서 동의하지 않습니다.
EAD 데이터를 해석하는 것은인가 된 전류의 높은 결합 특성과 열에너지 증가로 인해 어렵습니다. 고 전도성 금속에서 작은 전류 밀도조차도 재료 온도를 상당히 높일 수 있습니다. 예 : 1다양한 알루미늄 및 구리 합금 6 , 7 , 8 , 9 에 대해 33-120 A / mm2의 전류 밀도로 30-240 ° C. 이 온도 변화는 탄성 계수, 항복 강도 및 유동 응력에 큰 영향을 줄 수있어 열 및 전기 변색 효과를 구별하는 것이 쉽지 않습니다. 이러한 어려움을 강조하면서 최근의 연구는 줄 열선 가설 또는 전기 변색 가설을 뒷받침하는 것으로 밝혀졌습니다. 예를 들어 알루미늄, 구리 및 티타늄의 다양한 합금에서 전기 기계적 변형을 연구 한 연구자들은 전기 열가소성이 주울 가열만으로는 설명 할 수 없기 때문에 변형이 증가됨을보고했습니다 .1 , 6 , 7 . 그 보고서를 대조하는 것은 EAD 스트레스 감소가 tItanium, 스테인리스 스틸 및 Ti-6Al-4V를 열 효과 10 , 11에 적용 합니다.
열 관리는 EAD 연구에만 국한된 것이 아니라 전기 기계 소재 특성을 조사 할 때 일반적인 관심사입니다. 특히 질량 중심이 주변으로부터 깊이 절연되어있는 큰 시편에서는 균일 한 온도를 유지하는 것이 어려울 수 있습니다. 표본 크기와 관련된 또 다른 전자 기계적 시험 과제는 전기 기계적 응력과 관련된 근본적인 미세 구조 변화의 현장 및 실시간 관찰을 수행 할 수있는 능력입니다. in-situ TEM 기계 시험은 표준 시험편 12 에 대해 일상적으로 수행되지만 시료의 비 균일 단면은 게이지 부분 근처의 전류 밀도 및 열전달에 기하학에 따라 달라질 수 있습니다. 요약하면, EA 관찰 및 해석의 주요 문제점 D 메커니즘은 표본 크기와 관련이 있으며 다음과 같이 요약 될 수있다. 1) 열전기 결합은 표본 온도에 영향을 주어 하나의 제안 된 EAD 메커니즘을 분리하기 어렵게하고 2) 표준 시험 샘플 및 절차는 현장 , 실시간 인가 된 전류 하에서 장력이있는 물질에 대한 연구. 전류, 기계적 부하 및 온도를 제어하면서 투과 전자 현미경 (TEM)에서 매우 낮은 용적 게이지 단면을 가진 시편에 대해 EAD 실험을 수행함으로써 이러한 문제를 극복 할 수 있습니다.
이 논문에서는 큰 / 큰 크기에 부착 된 마이크로 / 나노 스케일 게이지 섹션 (10 μm x 10 μm x 100 nm)을 가진 시편 구조를 이용하여 줄 열 효과를 무시할 수있는 EAD 실험을위한 샘플 준비 및 테스트 절차를 설명합니다 안정화지지 프레임. 분석 및 수치 모델링을 통해(3,500 A / mm 2 )에서도 시료의 온도는 거의 증가하지 않았다 (<0.02 ° C). 마이크로 디바이스 기반 전기 기계 시험 시스템의 3 차원 도식 (MEMTS)는 그림 1 에 나와 있습니다. 여기에 제시된 방법의 또 다른 중요한 이점은 종종 수행 된 것처럼 사후 테스트 샘플을 검사하기보다는 표본 구조와지지 프레임이 직접 투과 전자 현미경 ( TEM) 시료 홀더에 전기적 및 기계적 부하를 동시에 적용 할 수있는 기능을 제공합니다.이 설정은 나노 수준에서 원자 수준까지의 해상도에서 실시간으로 현장 변형 관찰을 가능하게합니다. 단결정 구리 표본은 여기에 설명 된 절차에 사용되지만 ,이 방법은 다른 재료 표본에 적용하기에 충분히 유연하다.금속, 세라믹 및 폴리머 15 , 16 .
프로토콜
1. Si 프레임의 미세 가공
- 180 μm 두께의 Si 웨이퍼에 스핀 코팅 (3,000 rpm 및 30 s) SPR220-7 포토 레지스트 (PR). 웨이퍼를 완전히 코팅하기에 충분한 PR을 사용하십시오. 웨이퍼의 결정 평면 방향은 중요하지 않습니다.
- 핫 플레이트에서 PR 층 (약 7.5 μm 두께)으로 60 ° C에서 2 분 동안 소프트 베이크 한 다음 115 ° C에서 90 °로 부드럽게 베이킹합니다.
- Si 프레임의 모양을 정의하기 위해 빛을 통과시키는 패턴 화 된 크롬 / 유리 포토 마스크를 통해 PR 레이어를 자외선에 노출시킵니다. 이 단계와 다음 단계에 표준 포토 리소그래피 장비와 공정을 사용하십시오 ( 그림 2a-b ).
- 희석 된 MF 24A 또는 MF 319에 Si 웨이퍼에 PR을 약 1 분 동안 담그어 포토 마스크를 통해 노출 된 패턴을 현상합니다 ( 그림 2c ). 패턴 화 된 PR 층은 단계 1.6 동안 마스크로서 작용한다.
- 180 μm 두께의 Si 웨이퍼를 500 μm 두께의 지지체에 결합 Si wafe보다 쉬운 취급을 위해 저 융점 임시 접착제를 사용하십시오 (자세한 내용은 표 참조). 핫 플레이트 (70 ° C)를 사용하여 유리 접시에 접착제를 가열하고지지 웨이퍼를 코팅하기에 충분한 접착제 만 사용하십시오. 그런 다음 180μm 두께의 Si 웨이퍼를 500μm 두께의 웨이퍼 위에 가볍게 누르십시오 ( 그림 2d ).
- 위의 상부 실리콘 웨이퍼를 에칭하여 독립 구조물을 만듭니다. 에칭 단계를 위해 SF 6 및 C 4 F 8 가스와 함께 Bosch 공정을 사용하는 상업적으로 이용 가능한 유도 결합 플라즈마 반응성 이온 에칭 시스템을 얼마든지 사용할 수 있습니다. Bosch 공정에서, 패시베이션 층 증착과 플라즈마 에칭의주기가 반복적으로 이루어지면서 대부분 손상되지 않은 측벽을 갖는 깊이 에칭 된 트렌치가 생성됩니다 (그림 2e).
- SF 6 및 C 4 F 8 의 3 및 100 sccm 유량을 증착하는 동안 5 초 동안 그리고 SF 6 및 C 4 F의 100 및 2.5 sccm
- 20 분마다 계측기를 사용하여 에칭 된 트렌치의 깊이를 측정하여 계측기 및 에칭 레시피에 특정한 에칭 속도를 보정합니다.
- 하프 아세톤 침지 ( 그림 2f )를 사용하여 임시 접착제와 PR을 제거하여지지 Si 웨이퍼를 분리하고 얇은 Si 웨이퍼를 청소하십시오. 그런 다음 얇은 웨이퍼를 탈 이온 (DI) 수로 완전히 헹구십시오.
- SiH 4 , N 2 O 및 N 2 가스 ( 그림 2g )가있는 상업적으로 이용 가능한 플라즈마 강화 화학 기상 증착 (PECVD) 시스템을 사용하여 Si 프레임의 양면에 300 ° C에서 SiO 2 절연 층을 증착합니다. 표준 SiO 2 증착법을 사용하십시오. 예를 들어 170 sccm에서 5 % SiH 4 를 사용하고 710 sccm에서 N 2 O를 사용하십시오두께 2-3㎛의 SiO2 층을 증착시켰다.
- 개별 직사각형 Si 프레임을 주변 구조물에 연결하는 탭을 분리하십시오. 광학 현미경으로 날카로운 핀셋을 사용하십시오 ( 그림 2h ).
2. 금속 시편의 레이저 패터닝
- 5.0 cm x 5.0 cm 구리 호일 (99.99 % 순도; 재료 표 참조) 을 잘라서 유리 슬라이드에 테이프로 붙이십시오. 양면에 1μm 두께의 PR 층을 스핀 코팅하십시오. 레이저 기술을 사용하여 넓은 범위의 두께 (최대 100 μm)의 호일을 절단 할 수 있지만 데모 용으로 두 가지 두께 (13 μm 및 25 μm)를 사용하십시오. 표면을 완전히 코팅하려면 충분한 PR을 사용하십시오. 115 ° C에서 2 분간 PR을 굽습니다. PR은 레이저 커팅 단계에서 생성 된 부스러기로부터 구리 호일의 표면을 보호하고 표본 빔 (단계 2.4 참조)의 화학적 에칭을 허용하기 위해 필요합니다e 호일의 표면.
- 펄스 폭이 90ns 인 50kHz의 355nm, 10W, 고체 상태, 주파수 3 배 Nd : YVO 4 펄스 레이저를 사용하여 각각 4mm의 구리 프레임으로 고정 된 4 개의 개별 시편의 배열을 자른다. 1 mm 너비 ( 그림 3b ).
- 구리 호일의 표면에서 레이저 빔을 65 mJ / cm 2 의 유속으로 조절합니다. 이것은 과도한 가열 및 / 또는 인접한 구리의 손상없이 2 회의 통과로 구리를 절단하는데 충분한 레이저 에너지를 제공한다. 각 시편의 패턴은 한 번에 20 개의 시편을 생성하는 동박을 자르기 위해 레이저 빔을 스캔하는 Galvo 스캐닝 미러에 의해 생성됩니다 ( 그림 3a ). 30 μm (13 μm 두께의 호일 인 경우) ~ 50 μm (25 μm 두께 호일 인 경우)에서 레이저 절단 표본 빔의 폭을 조정하십시오.
- 40-60 ° C에서 30 초 동안 (40μm 두께의 호일의 경우) 또는 40 초 (t두께 25 μm의 호일)을 사용하여 손상된 레이저 절단 에지를 제거하고 20 μm 아래의 개별 표본 빔의 너비를 줄이며 ( 그림 3c ) 매끄러운 빔 에지 프로파일을 생성합니다.
- 첫 번째 아세톤의 별도 솔벤트 조에 어레이를 담그고 보호 성 포토 레지스트를 제거한 다음 메탄올을 순차 따라 이소프로판올로 옮긴 다음 질소로 건조시킵니다. 표본 배열을 건조 질소 데시 케이 터에 보관하십시오. 상기 제조 단계의 단면도가 도 3d 에 도시되어 있다 .
- 레이저를 사용하여 시편 어레이 주변의 상자를 잘라 구리 호일의 나머지 부분에서 꺼냅니다.
3. 조립 및 원위치 TEM 실험
- 개별 시험편 (구리 프레임 포함)을 미니 가위로 분리하십시오. 실리콘 프레임에 소량의은 에폭시를 놓고 시편을 광학 현미경으로 조심스럽게 정렬하여 시편 게이지가 th의 중심에있는 좁은 간격e 프레임 ( 그림 4a ).
- 3.1 단계와 마찬가지로 은색 에폭시로 시편의 양단에 은선 (직경 50um)을 연결하십시오 ( 그림 5c ).
- 집중 이온빔 (FIB) 밀링을 사용하여 다중 어깨가있는 나노 스케일 게이지 섹션 (100 nm x 10 μm x 10 μm)을 만듭니다. 게이지 섹션에서 멀어지는 점진적으로 두꺼운 단면은 전류 밀도에서 부드럽게 전이하고 게이지 섹션에서보다 균일 한 전류 밀도를 생성하고 주어진 어깨에서 국부적 인 발열을 최소화하는 것을 의미합니다. 손상을 최소화하려면 구리 시편의 최종 밀링 중에 감소 된 가속 전압 (5 kV)과 전류 (<80 pA)를 사용하십시오. 주사 전자 현미경 (SEM) 이미지 ( 그림 4b-e 및 5b )를 사용하여 게이지의 단면적을 측정합니다.
- 레이저 절단, FIB 또는 미니 가위로 시험편 프레임을 제거하십시오 ( 그림 4a의 삽 입을 참조하십시오). 이미지의 경우는 아니지만 위치 of 게이지 부에 재료가 손상 될 가능성을 최소화하기 위해 절단부는 게이지 부와 멀리 떨어져 있어야합니다.
- MEMTS를 광학 현미경으로 TEM 홀더 ( Table of Materials 참조)에 올려 놓은 다음 볼트와 비전 도성 와셔를 사용하여 부착하십시오. 와셔는 조립 중에 원치 않는 비틀림을 방지하는 데 사용됩니다. 50W CO 2 레이저 시스템을 사용하여 경질 섬유 전기 그레이드 시트에서 패턴 화 된 와셔 (0.5mm 두께)를 사용하십시오 (레이저 절단 중 특정 매개 변수 에 대해서는 표를 참조하십시오).
- 실버 전도성 에폭시를 사용하여 단계 3.2의은 전선을 TEM 홀더의 금속 핀 ( 그림 5a )에 연결하십시오.
- 휴대용 또는 데스크탑 멀티 미터를 사용하여 MEMTS ( 그림 1의 B 및 C)의 저항을 점검하여 게이지 섹션이 손상되지 않았는지 확인하십시오. 저항은 100 Ω 미만이어야합니다. 또한 MEMT 사이의 저항을 측정하십시오.S와 전기적으로 접지 된 TEM 시편 홀더를 사용하여 시편과 TEM 홀더 사이에 전기 누설이 없는지 확인합니다. 시험편이 분리 된 경우 측정 된 저항은 10MΩ보다 커야합니다.
- 현장 실험을 위해 MEM과 TEM 홀더를 TEM에 놓습니다.
- 외부 DC 전원 공급 장치 ( 재료 표 참조)를 TEM 홀더의 내장 된 전기 피드 스루에 연결하여 전류 제어를 위해 TEM 챔버 외부에서 시험편에 DC 입력 신호를 적용하십시오. 전기 연결 위치는 TEM 홀더 제조사에 따라 다르지만이 연구에서 연결부는 홀더 손잡이에 위치하고 핀 커넥터는 전원 공급 장치에서 TEM 시험편에 전원을 공급하는 데 사용됩니다. 입력 전류를 단면적 ( 그림 5b 의 SEM 이미지에서 얻음)으로 나누어 게이지 섹션에서 공칭 전류 밀도를 구하십시오.
참고 : 단일 기울기트레이닝 TEM 홀더는 별도의 변위 컨트롤러 ( Table of Materials )로 제어되는 내장 액추에이터를 포함합니다. - 기계적 및 전기적 부하를 제어하면서 다음 단계에서 TEM 이미지를 얻습니다. 다른 변형 및 전류 부하도 사용할 수 있습니다.
- 하나 또는 여러 개의 전위가 동시에 관찰 될 때까지 내장 압전 액추에이터의 분해능 (이 예에서는 ~ 0.34 nm)에 따라 작은 단계로 점진적으로 인장 변형을 적용하십시오. 이것은 중요한 단계이므로 열 및 / 또는 전기 에너지를 추가로 증가 시키면 추가 운동이 발생합니다.
- 검체가 1 분간 평형을 이루도록하십시오.
- 시험편에 입력 전류 밀도를 적용하십시오. 작은 단면 때문에 전류는 큰 전류 밀도에서도 온도가 크게 상승하지 않을 정도로 충분히 낮아야합니다 (
 ) 안에그는 게이지 섹션. 게이지 섹션의 중앙에서 최대 온도 상승은 아래에서 설명하는 바와 같이 시편 형상과 재료 특성에 따라 다릅니다.
) 안에그는 게이지 섹션. 게이지 섹션의 중앙에서 최대 온도 상승은 아래에서 설명하는 바와 같이 시편 형상과 재료 특성에 따라 다릅니다. - 정상 상태의 시료를 이미지화하려면 이미지를 획득하기 전에 전류를 일정하게 유지 한 채로 전자빔 아래에 보관하십시오. 이러한 방식으로 시료가 평형을 유지하도록 허용하는 것은 기계적 또는 전기적 부하의 변화 후에 적용됩니다.
결과
위에서 설명한대로 준비하고 테스트하면 그림 6a 에 표시된 단결정 구리 (SCC) 표본과 비슷한 게이지에서 파단 된 표본이 생성되어야합니다. 기계적 고장은 SCC 시험편이 절연 와셔와 산화 피복 실리콘 프레임에 의해 전기적으로 절연되어 있음을 확인함으로써 저항이 크게 증가해야합니다. 시편의 평면 전위는 TEM의 밝은 영역 모드를 영역 축 근처에 집중하여 관찰해야합니다. 유동 응력 (후 항복 평형 상태)에 도달 할 때까지 점차적으로 변형을 증가시킴으로써, 전위 운동이 보일 것입니다 ( 그림 6 b ). 추가적인 변형 및 / 또는인가 된 전류로, 대응하는 전위 운동이 연속적으로 모니터링 될 수 있습니다.
그림도 7은 SCC 시편 13 에 대한 EAD 실험 동안의 대표적인 이미지를 도시한다. 시험편을 항복 후 평형 상태로 변형시킨 후, 전류를 가하지 않고 추가 변형을 가했다 ( 그림 7b 1 참조). 이것은 그림 7 b 2 의 화살표로 표시된 것처럼 새로운 전위 루프 (또는 아마도 제 2 전위 슬라이딩)를 초래했습니다. 변형률을 수정하지 않고 전류 밀도를 500A / mm2로 적용했지만 전위가 현저히 떨어지지는 않았다 ( 그림 7 b 3 ). 전류를 제거하고, 시편을 1 분 동안 일정하게 유지하고, 변형을 다시 증가시켜, 도 7b 의 화살표로 표시된 전위 루프에 대한 현저한 변화를 다시 일으킨다 4 . 이 결과는이 절차가 전기적으로 보조 된 변형과 관련된 열적 및 전기적 효과를 격리 할 수 있음을 보여줍니다. 높은 전류 밀도 (최대 5 kA / mm2)와 관련된 실험도이 기술을 사용하여 수행되어 비슷한 결과를 얻었습니다. 추가 변형이없는 경우 관찰 가능한 추가적인 전위 운동은 없었습니다. 더 높은 전류 밀도를 사용하면 이전의 EAD 데이터 세트가 복잡한 Joule heating으로 인한 열 응력을 제거하는이 기술의 능력을 강조합니다.
샘플 게이지 섹션의 작은 크기를 고려할 때 고품질 소재를 선택하는 것이 가장 중요합니다. 예를 들어 게이지 섹션 근처의 미세한 재료 결함, 즉 보이드 (void)은 재료 준비 과정에서 표본의 파국적 인 실패를 초래합니다 ( 그림 4 g ). 이것은 특히 X 선 회절 지형과 같은 추가적인 비파괴 검사를 수행하지 않고도 게이지 섹션에 보이지 않는 재료 결함이 있는지를 아는 것은 어렵 기 때문에 도전적입니다.
또 다른 핵심 과제는 Ga 이온 주입, 이온빔 유도 전위, 레이저 유도 가열로 인한 비정질 구조 형성을 포함하여 레이저 또는 집중 이온 밀링 중에 표면 손상이 발생할 수 있다는 것입니다. 대부분의 표면 인공물은 부드러운 FIB 밀링 프로세스 (단계 3.3)를 사용하여 제거 할 수 있습니다. 그러나 이러한 미세 가공 기술의 사용은 이러한 표면 결함이 시편의 미세 구조를 변화시키고 EAD 실험 결과에 큰 영향을 미칠 수 있으므로 신중한 고려가 필요합니다. 우리의 연구에서 고분해능 TEM 이미지와 회절 패턴을 사용하여 우리의 시편이 참으로 순수한 단결정 구리임을 확인했습니다. 그림 6 c .
content ": keep-together.within-page ="1 "> 게이지 섹션의 중앙에서 최대 온도 상승이 다음의 식 13을 사용하여 계산 될 수 있다는 점은 주목할 가치가있다. 어디에
어디에  는 전류 밀도,
는 전류 밀도,  게이지 섹션 길이,
게이지 섹션 길이,  전기 비저항이며,
전기 비저항이며,  열전도도입니다. 이 방정식은 게이지 섹션의 온도 상승이 매우 민감하다는 것을 나타냅니다.
열전도도입니다. 이 방정식은 게이지 섹션의 온도 상승이 매우 민감하다는 것을 나타냅니다.  최대 시편 온도 상승은 게이지 길이의 제곱에 직접적으로 관련되어 있기 때문입니다. 예를 들어 게이지 섹션 길이를 10μ에서부터 10 배 증가 시키십시오. m (현재 연구에서 사용)을 100 μm로 증가 시키면 온도 상승이 2 배 증가했을 것입니다. ~ 0.02 ° C의 온도 상승 대신에, 온도는 ~ 2 ° C 증가했을 것이며 이는 본 연구에서 유의미한 차이를 만들어 냈을 것입니다. 또한 재료 선택은 온도 상승에도 영향을 미친다. 이 연구에 사용 된 구리는 상대적으로 낮은 전기적 저항성과 높은 열전도 계수를 가지며, 결과적으로 주어진 전류 밀도에 대해 구리 시편의 예상 온도 상승은 다른 시편과 비교하여 훨씬 작을 것이다. 예를 들어, 백금은 구리에 비해 6 배 더 큰 저항률과 5 배 더 작은 전도도를 가지므로 결과적으로 게이지 길이와 주어진 전류 밀도가 백금 케이스의 경우 훨씬 더 큰 온도 상승 (약 30 배)이 예상됩니다 같은.
최대 시편 온도 상승은 게이지 길이의 제곱에 직접적으로 관련되어 있기 때문입니다. 예를 들어 게이지 섹션 길이를 10μ에서부터 10 배 증가 시키십시오. m (현재 연구에서 사용)을 100 μm로 증가 시키면 온도 상승이 2 배 증가했을 것입니다. ~ 0.02 ° C의 온도 상승 대신에, 온도는 ~ 2 ° C 증가했을 것이며 이는 본 연구에서 유의미한 차이를 만들어 냈을 것입니다. 또한 재료 선택은 온도 상승에도 영향을 미친다. 이 연구에 사용 된 구리는 상대적으로 낮은 전기적 저항성과 높은 열전도 계수를 가지며, 결과적으로 주어진 전류 밀도에 대해 구리 시편의 예상 온도 상승은 다른 시편과 비교하여 훨씬 작을 것이다. 예를 들어, 백금은 구리에 비해 6 배 더 큰 저항률과 5 배 더 작은 전도도를 가지므로 결과적으로 게이지 길이와 주어진 전류 밀도가 백금 케이스의 경우 훨씬 더 큰 온도 상승 (약 30 배)이 예상됩니다 같은. p_upload / 55735 / 55735fig1.jpg "/>
그림 1 : 마이크로 디바이스 기반 전기 기계 테스트 시스템 (MEMTS). 이 이미지는 중요한 구성 요소와 시편이 TEM 홀더에 끼우는 방법을 보여주는 3 차원 (3D) 도식입니다. 시험편을 TEM 홀더의 핀에 연결하는 와이어 만 표시되지 않습니다. 이 그림의 더 큰 버전을 보려면 여기를 클릭하십시오.

그림 2 : 실리콘 프레임 제조 공정. 노출 된 Si 웨이퍼 ( a )는 포토 레지스트 ( b )로 스핀 - 코팅되고, 포토 리소그래피를 사용하여 패터닝된다. 노광 된 포토 레지스트는 밑에있는 Si 웨이퍼 ( c )를 노출 시키도록 전개된다. 웨이퍼는보다 두꺼운지지 웨이퍼에 일시적으로 결합되고,이온 에칭 (RIE)은 더 얇은 상부 웨이퍼 ( d - e )를 에칭하기 위해 사용된다. 아세톤은 포토 레지스트를 제거하고지지 웨이퍼를 분리하는 데 사용됩니다 ( f ). 실리콘 산화물 층은 에칭 된 웨이퍼 ( g )의 모든 표면 상에 증착된다. 마지막으로, 개별 프레임을지지 탭 ( h )에서 조심스럽게 잡아 당겨 웨이퍼에서 분리합니다. 이 그림의 더 큰 버전을 보려면 여기를 클릭하십시오.

그림 3 : 금속 시편 제작. ( a ) 구리 시편의 배열 ( b ) 개별 시편 및 ( c ) 게이지 섹션의 확대보기의 광학 이미지. 제조 공정 단계는 ( d ), 이는 a ( b )의 A-A를 따른 단면입니다. 얇은 포일의 양면은 레이저 커팅 동안 샘플을 보호하기 위해 포토 레지스트로 코팅됩니다 ( d , 상단). 구조는 레이저 가공 ( d , 초) 후 부드러운 에지 ( d , 세 번째)를 만들기 위해 에칭됩니다. 많은 시편은 ( a )에서와 같이 한 번의 제작 작업으로 생산할 수 있습니다. 마지막으로, 포토 레지스트를 벗겨 내고 개별 시편을 시편 시트에서 부드럽게 제거합니다 ( d , 하단). 이 그림의 더 큰 버전을 보려면 여기를 클릭하십시오.
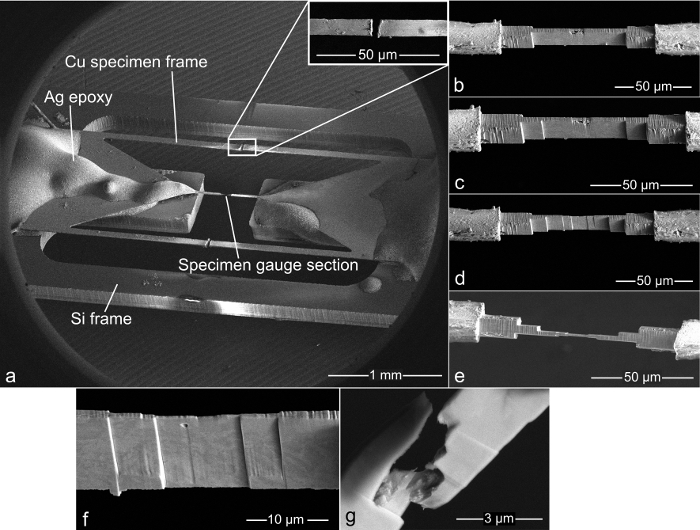
그림 4 : 집중 이온빔 (FIB) 밀링 이미지. 이미지 ( a )는 Si 프레임에 부착 된 시편과 클로즈업 뷰를 보여줍니다(레이저 커팅 된 후) 시편 지지체의 인서트 (삽입). 이미지 ( b ) - ( e )는 FIB가 연속적으로 통과하는 동안 게이지 섹션이 점점 더 얇아지는 것을 보여줍니다. 각 패스는 표면 마무리를 개선하고 밀링 공정으로 인한 재료 특성 변화를 줄이기 위해 적은 재료를 제거합니다. 그러나 게이지 섹션 결함이 남아있어 ( f ) 변형이 적용되기 전에 재료가 파손될 수 있습니다 ( g ). 이 그림의 더 큰 버전을 보려면 여기를 클릭하십시오.

그림 5 : TEM 홀더에 장착 된 시험편. ( a )와 ( b )는 TEM 홀더에 조립 된 시편을 보여주고 gen을 사용하여 매끄러운 표면을 가진 게이지 섹션의 최종 치수를 보여준다FIB 밀링. 시편이 Si 프레임에 접착되고은 전선이 전도성 에폭시 ( c )를 사용하여 부착되면 Si 프레임의 두 개의 원형 구멍을 사용하여 시편을 TEM 홀더에 장착합니다. 비전 도성 와셔는 TEM 홀더에서 시험편을 절연시키는 데 사용됩니다. 마지막으로은 전선이 전도성 에폭시를 사용하여 TEM 홀더 핀에 부착됩니다. AIP 게시의 허가를 받아 13 개가 수정되었습니다. 이 그림의 더 큰 버전을 보려면 여기를 클릭하십시오.

그림 6 : 대표적인 단결정 구리 (SSC) 시편. ( a )는 게이지 섹션의 고장 이후에 취해진 게이지 섹션 ( 그림 1의 위치 A)을 보여줍니다. ( b )은 평면 변위를 보여주는 게이지 섹션의 명 시야 이미지입니다. ( c )는 게이지 부에서의 회절 패턴을 도시한다. AIP 게시의 허가를 받아 13 개가 수정되었습니다. 이 그림의 더 큰 버전을 보려면 여기를 클릭하십시오.

그림 7 : 현장 EAD 실험 TEM 이미지. 이 이미지는 전위 운동에 기계적 및 전기적 로딩 효과를 나타냅니다. ( b1 ) - ( b4 )는 ( a )의 영역 ( b ) 확대보기입니다. ( b1 )은 항복 후 평형 상태의 시편을 보여준다. ( b2 )는 ( b )에서 보여준 상태를 넘어서 추가적인 변형으로 인한 전위 루프 형성을 확인한다. b1). 전류를 가했을 때 변화는 관찰되지 않았다 ( b3 ). 일단 변형이 다시 증가하면, 더 이상의 전위 변화가 다시 발견되었다 ( b4 ). AIP Publishing의 허가를 얻어 13 세만을 재발행 함. 이 그림의 더 큰 버전을 보려면 여기를 클릭하십시오.
토론
마이크로 / 나노 기술은 스캐닝 16 , 18 , 19 , 20 , 21 및 투과 전자 현미경 13 , 22 , 23 , 24 를 포함한 분석 챔버에서의 물질 거동을 특성화하는 강력한 도구를 제공합니다. 이러한 현장 시험 능력은 고해상도 전자 현미경 25 , 26을 이용하여 근본적인 미세 구조 및 기본 변형 메커니즘을 직접 관찰 할 수 있으므로 재료 과학 및 엔지니어링 공동체에 매우 매력적입니다.
여기에서는 고유 한 adv를 사용하여 재료 샘플의 결합 된 전기적 및 기계적 거동을 조사하기위한 마이크로 디바이스 기반 방법을 제시했습니다원위치 TEM의 결과 이 방법의 단계는 포토 리소그래피, 반응성 이온 에칭 장비, 전자 현미경 및 여기에 사용 된 것과 같은 고품질 레이저 가공 시스템에 대한 액세스 및 교육을 사용하여 평균 경험이 필요합니다. 시편과 실리콘 홀더의 조립은 실버 에폭시와 기본 광학 현미경과 같은 간단한 수단을 사용하여 이루어 지지만 시편 게이지 섹션을 손상시키지 않도록주의해야합니다. 이것은 시편을 취급 할 때 항상 해당됩니다. 구리 시편의 최종 FIB 밀링 공정 중에도주의를 기울여야합니다. 최종 연마 중 가속 전압 (5 kV) 및 전류 (<80 pA) 27 을 줄이면 시편 손상 가능성이 감소하고 부드럽고 결함이없는 게이지 섹션이 생성됩니다. 기억해야 할 또 다른 중요한 항목은 시험편이 TEM 홀더와 전기적으로 절연되어 있는지 확인하여인가 된 전류가 게이지 섹션을 통과하는지 확인하는 것입니다실험이 시작되면
웨이퍼 에칭 공정은 EAD 시험편을위한 양호한 프레임을 제조하는 데 중요한 몇몇 단계를 포함한다. 웨이퍼 사이에 균일 한 일시적인 접착 코팅으로 180μm 웨이퍼에 500μm지지 웨이퍼를 일시적으로 접착하는 것은 중요하며, 깨지기 쉬운 에칭 된 웨이퍼를 취급하는 것을 돕는 것뿐만 아니라,지지 웨이퍼는 또한 플라즈마 에칭 공정 중에 열전달을 촉진한다. 불충분 한 열 전달은 PR 마스크의 에칭 및 후속하여 실리콘 프레임의 비 표적 에칭을 초래할 수있다. 또한 에칭 된 트렌치 깊이를 주기적으로 측정하는 것도 중요합니다. 더 얇은 상부 실리콘 웨이퍼는 완전히 에칭되어야하지만, 더 얇은 웨이퍼에 대해 균일 한 방열판으로 작용할 수 있도록지지 웨이퍼에 대한 에칭이 최소화되어야합니다. 마지막으로, 아세톤으로 에칭 된 웨이퍼를 철저하게 세정 한 후 SiO2 증착 전에 DI 물로 헹궈서 남은 재사용을 최소화하는 것이 중요합니다옆구리.
여기에 표시된 EAD 실험 이미지는 예상 할 수있는 것을 대표하지만 분해능, 투여 량 및 프레임 속도를 수정하여 전위를 더 잘 관찰하고 정량화 할 수 있습니다. 또한 이미지 처리 소프트웨어를 사용하여 향상된 해상도로 일련의 TEM 이미지를 분석 할 수 있습니다.
MEMTS는 전자 기계적 재료 거동을 연구 할 때 몇 가지 독특한 이점을 제공합니다. 이 시스템은 전자 기계적 하중 하에서 거시적 인 재료 변형을 제어하는 나노 스케일 현상을 직접 관찰 할 수 있습니다. 둘째, 단면이 작은 시험편 게이지 섹션은 낮은 전류 크기를 사용하여 상당한 전류 밀도를 적용 할 수 있으므로 고전력 기기를 사용함에 따른 안전 문제를 제거 할 수 있습니다. 예를 들어, 1 mm 2 게이지 섹션에 1,000 A / mm 2 의 전류 밀도를 적용하는 경우에만 1 kA가 필요합니다게이지 단면적이 1 μm 2 로 줄어들면 1 mA. 더 중요한 것은, 낮은 전류를 사용하면 열 관리를 돕는 것입니다. MEMTS는 또한 정렬 및 조립이 값 비싼 장비를 필요로하지 않으며 다른 마이크로 장치 기반 조립 방법에 비해 시간이 오래 걸리지 않는다는 점에서 독특합니다.
여기에 설명 된 방법은 금속, 세라믹 및 폴리머의 전자 기계 테스트에 적합하지만, 각 재료 클래스 내에서 미세 구조에 따른 전자 기계적 동작을 탐색하는데도 사용할 수 있습니다. 예를 들어, 단결정 및 다결정 성, 입자 방향, 입자 크기, 상 분포 및 결함 밀도가 전자 기계적 거동에 미치는 영향을 대표적인 시료를 준비하여 조사 할 수 있습니다. 이러한 포괄적 인 연구에서 얻은 통찰력은 EAD 구동 메커니즘을 더 잘 이해하고 EAD 제조 능력을 향상시키는 데 필요한 이해를 제공 할 수 있습니다. 더 많은 붓다 말하기dly에서 MEMTS는 열전 결합을 이용하는 다른 장치를 연구하는 데 유용한 플랫폼이 될 수 있습니다. 예를 들어, 그것은 Seebeck 효과를 통해 온도차로인가 전압을 변환하는 열전기 냉각기에 사용되는 물질을 관찰하는 데 사용할 수 있습니다.
비록 여기에 설명 된 공정을 사용하여 수행 된 실험이 상당한 줄 열이 없을 때 전기적으로 보조 된 변형이 발생했다는 것을 나타내지는 못했지만, 추가 실험이 필요합니다. 여기에 설명 된 프로세스는 실험 조건의 작은 세트를 활용하고 지역화 된 지역에 집중했습니다. EAD에서 순전히 전기적 효과의 존재 또는 부재를보다 확실하게 검증하려면 여러 재료, 전류 밀도 및 시간 규모를 사용하는보다 포괄적 인 실험 세트가 필요합니다. 현재의 MEMTS 접근법의 한 가지 기술적 한계는 현장 실험 중에 시편에 작용하는 힘을 정량화하는 능력이 부족하다는 것이다. 힘 측정은 필수적입니다.응력 - 변형률 데이터를 얻고 ( 예 : 시편이 유동 응력에 도달했을 때를 정량적으로 확인하기 위해), 현장 관측 과 결합 할 때 미세 구조 - 특성 관계를 직접 제공합니다. 이 독특한 연구 기회를 향해 현재 통합 된 힘 센서를 통합하기 위해 Si 프레임을 수정하고 있습니다.
공개
저자는 경쟁적인 금전적 이해 관계가 없다고 선언합니다.
감사의 말
이 연구는 미국 해군 연구소의 기초 연구 프로그램 (Basic Research Program)을 통해 ASEE-NRL 박사후 연구 펠로우쉽과 해군 연구청 (Office of Naval Research)의 지원을 받았다. 저자는 기술 지원에 대한 NRL의 C. Kindle에게 감사드립니다.
자료
| Name | Company | Catalog Number | Comments |
| Silicon wafers | Any high-quality polished wafers of the correct thickness will work | ||
| Photoresist | Dow | SR220-7 | |
| Photoresist developer | Shipley | MF 24A | |
| Photoresist developer | Rohm and Haas | MF 319 | |
| Temporary wafer adhesive | Crystalbond 509 | Available from a variety of sources | |
| Iductively Coupled Plasma Reactive Ion Etching (CP-RIE) system | Oxford | Plasmalab system 100 ICP RIE | |
| Profilometer | Veeco | Dektak 150 | |
| Plasma-Enhanced Chemical Vapor Deposition (PECVD) system | Oxford | Plasmalab system 100 PECVD | |
| Thin specimen sheet | Surepure Chemetals | 3702, 3703, 3704 or 2236 | 13 µm and 25 µm-thick copper, 99.99% 4N Pure |
| Photoresist | Shipley | 1818 | |
| 355 nm, 10 W, solid-state, frequency tripled Nd:YVO4 pulsed laser | JDSU | Q301-HD | |
| Liquid ferric chloride | Sigma-Aldrich | 157740 | |
| Conductive silver epoxy | Chemtronics | CW2400 | |
| Silver wires | Any highly conductive metallic wires will work (<100 µm in diameter) | ||
| Focused Ion Beam (FIB) | FEI | Nova 600 | |
| Single tilt straining TEM holder | Gatan | 654 | |
| Displacement controller | Gatan | 902 Accutroller | May be sold with the TEM holder |
| CO2 laser cutter | Universal Laser Systems | VLS 3.50 | Use 50% power and 15% speed |
| Electrical insulation sheet | 0.5 mm-thick Hard Fiber Electrical Grade Sheet (Fishpaper) | Available from a variety of sources | |
| Transmission Electron Microscope (TEM) | FEI | Tecnai G2 | |
| External power supply | Keithley | 2400 SourceMeter |
참고문헌
- Ross, C. D., Kronenberger, T. J., Roth, J. T. Effect of dc on the formability of Ti-6Al-4V. J Eng Mater-T ASME. 131 (3), 031004(2009).
- Siopis, M. S., Kinsey, B. L. Experimental investigation of grain and specimen size effects during electrical-assisted forming. J Manuf Sci Eng-T ASME. 132 (2), 021004(2010).
- Green, C. R., McNeal, T. A., Roth, J. T. Springback Elimination for Al-6111 Alloys Using Electrically Assisted Manufacturing (EAM). 37th Annual North American Manufacturing Research Conference. 37, Greenville, SC. 403-410 (2009).
- Okazaki, K., Kagawa, M., Conrad, H. A study of the electroplastic effect in metals. Scr Mater. 12 (11), 1063-1068 (1978).
- Sprecher, A. F., Mannan, S. L., Conrad, H. Overview no. 49. On the mechanisms for the electroplastic effect in metals. Acta Metall. 34 (7), 1145-1162 (1986).
- Perkins, T. A., Kronenberger, T. J., Roth, J. T. Metallic forging using electrical flow as an alternative to warm/hot working. J Manuf Sci Eng-T ASME. 129 (1), 84-94 (2007).
- Andrawes, J. S., Kronenberger, T. J., Perkins, T. A., Roth, J. T., Warley, R. L. Effects of DC current on the mechanical behavior of AlMg1SiCu. Mater Manuf Process. 22 (1), 91-101 (2007).
- Dzialo, C. M., Siopis, M. S., Kinsey, B. L., Weinmann, K. J. Effect of current density and zinc content during electrical-assisted forming of copper alloys. CIRP Ann Manuf Techn. 59 (1), 299-302 (2010).
- Fan, R., Magargee, J., Hu, P., Cao, J. Influence of grain size and grain boundaries on the thermal and mechanical behavior of 70/30 brass under electrically-assisted deformation. Mater Sci Eng A. 574, 218-225 (2013).
- Magargee, J., Morestin, F., Cao, J. Characterization of Flow Stress for Commercially Pure Titanium Subjected to Electrically Assisted Deformation. J Eng Mater Technol. 135 (4), 041003(2013).
- Kinsey, B., Cullen, G., Jordan, A., Mates, S. Investigation of electroplastic effect at high deformation rates for 304SS and Ti-6Al-4V. CIRP Ann - Manuf Technol. 62 (1), 279-282 (2013).
- Williams, D. B., Carter, C. B. Transmission electron microscopy. , 2nd edn, Springer. (2008).
- Kang, W., Beniam, I., Qidwai, S. M. In situ electron microscopy studies of electromechanical behavior in metals at the nanoscale using a novel microdevice-based system. Rev Sci Instrum. 87 (9), (2016).
- Kim, M. J., et al. Electric current-induced annealing during uniaxial tension of aluminum alloy. Scr Mater. 75, 58-61 (2014).
- Knowles, M. R. H., Rutterford, G., Karnakis, D., Ferguson, A. Micro-machining of metals, ceramics and polymers using nanosecond lasers. Int J Adv Manuf Tech. 33 (1-2), 95-102 (2007).
- Kang, W., Saif, M. T. A. A novel SiC MEMS apparatus for in situ uniaxial testing of micro/nanomaterials at high temperature. J Micromech Microeng. 21 (10), (2011).
- Callister, W. D. Materials Science and Engineering: An Introduction. , 7th edn, John Wiley & Sons, Inc. (2007).
- Kang, W., Saif, M. T. A. A Novel Method for In Situ Uniaxial Tests at the Micro/Nano Scale-Part I: Theory. J Microelectromech Syst. 19 (6), 1309-1321 (2010).
- Kang, W., Han, J. H., Saif, M. T. A. A Novel Method for In Situ Uniaxial Tests at the Micro/Nanoscale-Part II: Experiment. J Microelectromech Syst. 19 (6), 1322-1330 (2010).
- Kang, W. M., Saif, M. T. A. In Situ Study of Size and Temperature Dependent Brittle-to-Ductile Transition in Single Crystal Silicon. Adv Func Mater. 23 (6), 713-719 (2013).
- Sim, G. D., Vlassak, J. J. High-temperature tensile behavior of freestanding Au thin films. Scr Mater. 75, 34-37 (2014).
- Haque, M. A., Saif, M. T. A. Deformation mechanisms in free-standing nanoscale thin films: A quantitative in situ transmission electron microscope study. Proc Natl Acad Sci U S A. 101 (17), 6335-6340 (2004).
- Zhu, Y., Espinosa, H. D. An electromechanical material testing system for in situ electron microscopy and applications. Proc Natl Acad Sci U S A. 102 (41), 14503-14508 (2005).
- Hosseinian, E., Pierron, O. N. Quantitative in situ TEM tensile fatigue testing on nanocrystalline metallic ultrathin films. Nanoscale. 5 (24), 12532-12541 (2013).
- Kang, W., Rajagopalan, J., Saif, M. T. A. In Situ Uniaxial Mechanical Testing of Small Scale Materials-A Review. Nanosci Nanotechnol Lett. 2 (4), 282-287 (2010).
- Kang, W., Merrill, M., Wheeler, J. M. In Situ Thermomechanical Testing Methods for Micro/Nano-Scale Materials. Nanoscale. , (2016).
- Thompson, K., Gorman, B., Larson, D., Bv Leer,, Hong, L. Minimization of Ga Induced FIB Damage Using Low Energy Clean-up. Microsc Microanal. 12 (S02), 1736-1737 (2006).
- Mayer, J., Giannuzzi, L. A., Kamino, T., Michael, J. TEM sample preparation and FIB-induced damage. MRS Bulletin. 32 (5), 400-407 (2007).
재인쇄 및 허가
JoVE'article의 텍스트 или 그림을 다시 사용하시려면 허가 살펴보기
허가 살펴보기더 많은 기사 탐색
This article has been published
Video Coming Soon
Copyright © 2025 MyJoVE Corporation. 판권 소유