Difração de raios X
Visão Geral
Fonte: Faisal Alamgir, Escola de Ciência e Engenharia de Materiais, Instituto de Tecnologia da Geórgia, Atlanta, GA
Difração de raios-X (XRD) é uma técnica usada na ciência dos materiais para determinar a estrutura atômica e molecular de um material. Isso é feito irradiando uma amostra do material com raios-X incidentes e, em seguida, medindo as intensidades e ângulos de dispersão dos raios-X que são espalhados pelo material. A intensidade dos raios-X dispersos são traçados em função do ângulo de dispersão, e a estrutura do material é determinada a partir da análise do local, no ângulo, e das intensidades dos picos de intensidade dispersa. Além de ser capaz de medir as posições médias dos átomos no cristal, informações sobre como a estrutura real se desvia do ideal, resultante, por exemplo, do estresse interno ou de defeitos, podem ser determinadas.
A difração dos raios-X, que é central para o método XRD, é um subconjunto dos fenômenos gerais de dispersão de raios-X. XRD, que é geralmente usado para significar pode difração de raios-X grande angular (WAXD), se enquadra em vários métodos que usam as ondas de raios-X espalhadas esteticamente. Outras técnicas de raio-X baseadas em dispersão elástica incluem dispersão de raios-X de pequeno ângulo (SAXS), onde os raios-X são incidentes na amostra ao longo da pequena faixa angular de 0,1-100 normalmente). O SAXS mede correlações estruturais da escala de vários nanômetros ou maiores (como superestruturas de cristal), e a reflexividade dos raios-X que mede a espessura, a rugosidade e a densidade de filmes finos. Waxd cobre uma faixa angularalém de 100 .
Princípios
Relação entre posições de pico ditracadas e estrutura cristalina:
Quando ondas de luz de comprimento de onda suficientemente pequeno são incidentes sobre uma rede de cristal, elas difracionam dos pontos de rede. Em certos ângulos de incidência, as ondas paralelas difundadas interferem construtivamente e criam picos detectáveis em intensidade. W.H. Bragg identificou a relação ilustrada na Figura 1 e derivava uma equação correspondente:
nλ = 2dhkl sin φ [1]
Aqui λ é o comprimento de onda dos raios-X usados, dhkl é o espaçamento entre um determinado conjunto de planos com (hkl) índices Miller*, e φ é o ângulo de incidência no qual um pico de difração é medido. Finalmente, n é um inteiro que representa a "ordem harmônica" da difração. Em n=1, por exemplo, temos o primeiro harmônico, o que significa que o caminho dos raios-X difundidos através do cristal (equivalente ao pecado de 2dhkl ) é exatamente 1λ, enquanto em n=2, o caminho difrracado é de 2λ. Normalmente podemos assumir n=1, e, em geral, n=1 para φ < sin-1(2λ/dh'k'l'), onde h'k'l' são os índices miller dos planos que mostram o primeiro pico (no menor valor 2φ) em um experimento de difração. Os índices miller são um conjunto de três inteiros que constituem um sistema de notação para identificar direções e planos dentro de cristais. Para direções, os índices miller [h k l] representam a diferença normalizada nas respectivas coordenadas x, y e z (em um sistema de coordenadas cartesiana) de dois pontos ao longo da direção. Para aviões, os índices Miller (h k l) de um avião são simplesmente os valores h k l da direção perpendicular ao plano.
Em um experimento XRD típico no modo de reflexão, a fonte de raios-X é fixada na posição e a amostra é girada em relação ao feixe de raios-X sobre φ. Um detector pega o feixe difrracado e tem que acompanhar a rotação da amostra girando em dobro da taxa (ou seja, para um determinado ângulo amostral de φ, o ângulo do detector é 2φ). A geometria do experimento é mostrada esquematicamente na Figura 1.
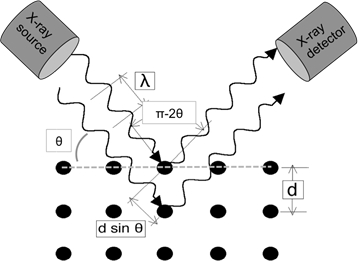
Figura 1: Ilustração da Lei de Bragg.
Quando um pico de intensidade é observado, a equação 1 é necessariamente satisfeita. Consequentemente, podemos calcular espaçamentos d com base nos ângulos em que esses picos são observados. Calculando os espaçamentos d de vários picos, a amostra de material da classe cristalina e dos parâmetros da estrutura cristalina pode ser identificada usando um banco de dados como o Hanawalt Search Manual ou bibliotecas de banco de dados disponíveis com o software XRD sendo usado.
Presumiremos que a amostra investigada não é um único cristal. Se a amostra fosse um único cristal com um plano específico (h*k*l** paralelo à superfície da amostra, ela precisaria ser girada até que a condição de Bragg para o (h*k*l** seja satisfeita para ver um pico em intensidade difruída (para n=1) com picos harmônicos potencialmente maiores (h*k*l** (por exemplo, para n=2) também detectáveis em ângulos mais elevados. Em todos os outros ângulos não haveria picos em uma única amostra de cristal. Em vez disso, vamos supor que a amostra é policristalina ou que é um pó, com um número estatisticamente significativo de grãos cristalinos ou partículas de pó iluminadas pelo feixe de raios-X incidente. Sob esta suposição, a amostra consiste em grãos orientados aleatoriamente, com probabilidade estatística semelhante para que todos os possíveis planos de rede difraças.
As relações entre o dhkl e os parâmetros da célula unitária são mostradas abaixo nas Equações 2-7 para as 7 classes de cristal, cúbicas, tetragonais, hexagonais, romboedais, ortombicas, monoclínicas e trilínicas. Os parâmetros da célula unitária consistem em comprimentos de (a,b,c) e os ângulos entre (α, β, γ) as bordas das células unitárias para as 7 classes de cristal (Figura 1x mostra o exemplo de uma das classes de cristal: a estrutura tetragonal onde a=b≠c e α=β=γ=900). Usando várias posições de pico ditracadas (ou seja, vários valores dhkl distintos), os valores dos parâmetros da célula unitária podem ser resolvidos exclusivamente.

Figura 2: A estrutura tetragonal como uma das sete classes de cristal.
Cúbico (a = b = c; α = β = γ = 900):
 [2]
[2]
Tetragonal (a = b ≠ c; α = β = γ = 900):
 [3]
[3]
Hexagonal (a = b ≠ c; α = β = 900; γ = 1200):
 [4]
[4]
Ortotómbico (≠ b ≠ c; α = β = γ = 900):
 [5]
[5]
Rombral (a = b ≠ c; α = β = γ = 900):
 [6]
[6]
Monoclínica (≠ b ≠ c; α = γ = 900 ≠ β):
 [7]
[7]
Triclínica (≠ b ≠ c; α ≠ β ≠ γ ≠ 900):
 [8]
[8]
Relação entre intensidades de pico ditracadas e estrutura cristalina:
Em seguida, examinamos os fatores que contribuem para a intensidade em um padrão XRD. Os fatores podem ser discriminados como 1) a contribuição para a dispersão que resulta diretamente dos aspectos estruturais únicos do material (os tipos e locais específicos de dispersão de átomos na estrutura) e 2) aqueles que não são específicos do material. No primeiro, há dois fatores: o "fator de absorção" e o "fator estrutura". O fator de absorção depende principalmente da capacidade do material de absorver raios-X em seu caminho para dentro e para fora. Este fator não tem uma dependência φ enquanto as amostras não são finas (a amostra deve ser > 3 vezes mais espessa do que o comprimento de atenuação dos raios-X). Em outras palavras, a contribuição do fator de absorção para a intensidade de diferentes picos é constante. O "fator estrutura" afeta diretamente a intensidade de picos específicos como resultado direto da estrutura. Os demais fatores, a "multiplicidade", que explica todos os planos que pertencem à mesma família por estarem simetricamente relacionados, e o fator 'Lorentz-Polarização', que vem da geometria do experimento XRD, também afetam a intensidade relativa dos picos, mas não são específicos de um material e podem ser facilmente contabilizados com expressões analíticas (ou seja, o software de análise XRD pode removê-los com funções analíticas).

Figura 3: Três caminhos de raios de difração, dos quais os raios 11' e 22' satisfazem a condição de Bragg, enquanto o raio 33' resulta da dispersão por um átomo (círculo vermelho) em uma posição arbitrária.
Como o único fator que carrega a contribuição estrutural única de um material para as intensidades relativas dos picos XRD, o fator estrutura é muito importante e requer um olhar mais atento. Na Figura 2, vamos supor que a condição de difração de1ª ordem bragg (lembre-se, que isso corresponde a n=1) está satisfeita entre o raio11' e o raio22' que estão espalhados em dois planos atômicos na direção h00 (usando a notação de índices miller descritos anteriormente) separados por uma distância d. Nesta condição, a diferença no comprimento do caminho entre o raio11' e o raio22' é δ(22'-11') = SA + AR = λ. A mudança de fase entre os raios difruídos 1 e 2 é, portanto, Φ22'-11' = (δ(22'-11')/λ) 2π = 2π (assumindo uma simetria cúbica e, portanto, d = a/h na direção h00].
Com alguns passos na geometria analítica, pode-se mostrar que a mudança de fase, Φ(33'-11'), com raio 3 difundido por um plano arbitrário de átomos que são espaçados a uma distância arbitrária x, é dada por: Φ(33'-11') = 2πhu, onde u=x/a (a é o parâmetro celular unitário na direção (h00). Tomando as duas outras direções ortogonais, (0k0) e (00l), e v=y/a e w=z/a como coordenadas fracionárias nas direções y e z, a expressão para o turno de fase se estende a Φ = 2π(hu+kv+lw). Agora, a onda de raios-X espalhada pelo átomo j-them uma célula unitária terá uma amplitude de dispersão de fj e uma fase de Φj,de tal forma que a função descrevendo-a é  . O fator estrutura que buscamos, portanto, é a soma de todas as funções de dispersão devido a todos os átomos únicos em uma célula unitária. Este fator de estrutura, F, é dado como:
. O fator estrutura que buscamos, portanto, é a soma de todas as funções de dispersão devido a todos os átomos únicos em uma célula unitária. Este fator de estrutura, F, é dado como:
 [9]
[9]
e o fator de intensidade contribuído pelo fator estrutura é I = F2.
Com base nas posições (u,v,w) de átomos em determinados planos (h,k,l), há a possibilidade de interferência entre ondas dispersas que seja construtiva, destrutiva ou no meio, e essa interferência afeta diretamente a amplitude dos picos XRD representando os planos (hkl).
Agora, um gráfico de intensidade, eu, contra 2φ é o que é medido em um experimento XRD. A determinação do tipo de cristal e dos parâmetros celulares unitários associados (a, b, c, α, β e γ) pode ser acompanhada de forma analítica observando a presença sistemática/ausência de picos, utilizando-se as equações 2-9, comparando valores com bancos de dados, utilizando dedução e processo de eliminação. Hoje em dia, esse processo é bastante automatizado por uma variedade de softwares ligados a bancos de dados de estruturas cristalinas.
Procedimento
O procedimento a seguir aplica-se a um instrumento XRD específico e seu software associado, e pode haver algumas variações quando outros instrumentos são usados.
- Examinaremos uma amostra de pó ni em um instrumento Panalytical Alpha-1 XRD.
- Primeiro, escolha a máscara para corrigir o tamanho do feixe de acordo com o diâmetro da amostra. O feixe não deve ter uma pegada maior que a amostra no menor valor φ (tipicamente ~ 70-100). Para uma amostra de largura ε, o tamanho do feixe deve ser < ε sinφ.
- Carregue a amostra no estágio de rotação da amostra e bloqueie a amostra na posição. O rotador de amostras ajuda a randomizar espacialmente a exposição da amostra à fonte de raios-X.
- Escolha o alcance de ângulo para a varredura XRD. Por exemplo, 15-90 graus é uma faixa típica.
- Escolha um tamanho de passo, ou seja, o incremento em 2φe o tempo de integração (contando). Geralmente, um tamanho de passo de 0,05 graus e 4 segundos de integração é o padrão para uma varredura grande angular.
- Uma vez que todas as posições de pico são determinadas através desta varredura inicial, as varreduras subsequentes podem se concentrar em uma faixa de varredura mais estreita em torno de picos específicos usando um tamanho de passo menor no ângulo se dados de resolução mais altos desses picos forem desejados.
Resultados
Na Figura 4 vemos os picos XRD para a amostra de pó ni. Note que os picos observados (por exemplo, {111}, {200}) são para aqueles que têm todas as combinações uniformes ou todas estranhas de h, k, e l. Ni é cúbico centrado no rosto (FCC), e em todas as estruturas fcc, os picos correspondentes a {hkl} planos onde h, k, e l são misturas de inteiros uniformes e estranhos, estão ausentes devido à interferência destrutiva dos raios-X dispersos. Picos correspondentes a aviões, como {210} e {211} estão faltando. Esse fenômeno é chamado de as regras sistemáticas de presença e ausência, e fornecem uma ferramenta analítica para avaliar a estrutura cristalina da amostra.
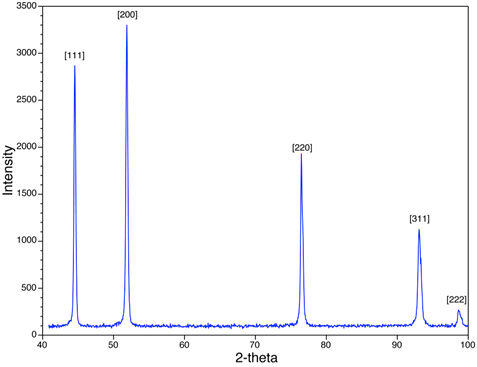
Figura 4: É mostrado um escaneamento XRD de Ni com uma estrutura cúbica centrada no rosto.
Aplicação e Resumo
Esta é uma demonstração de um experimento XRD padrão. O material examinado neste experimento estava em forma de pó, mas o XRD funciona igualmente bem com um pedaço sólido de material, desde que a amostra tenha uma superfície plana que pode ser definida paralelamente ao plano do estágio amostral.
XRD é um método bastante onipresente para determinar a presença (ou ausência) de ordem cristalográfica em materiais. Além da aplicação padrão de determinar a estrutura cristalina, o XRD é frequentemente usado para obter uma variedade de outras informações estruturais, tais como:
- Se a estrutura de um material é ou não amorfa (caracterizada por uma corcunda ampla na intensidade da difração e falta de picos cristalográficos perceptíveis),
- Se a amostra é um material composto composto composto por múltiplas fases cristalográficas e, se assim for, determinar a fração de cada fase,
- Determinar se um material é um composto amorfo/cristalino
- Determinando o tamanho do grão/partícula do material,
- Determinando o grau de textura (orientação preferida dos grãos) no material.
Tags
Pular para...
Vídeos desta coleção:

Now Playing
Difração de raios X
Materials Engineering
89.2K Visualizações

Materialografia Óptica Parte 1: Preparação da Amostra
Materials Engineering
15.5K Visualizações

Materialografia Óptica Parte 2: Análise de Imagens
Materials Engineering
11.1K Visualizações

Espectroscopia de fotoelétrons de raios-X
Materials Engineering
21.8K Visualizações

Feixes de Íons Focalizados
Materials Engineering
8.9K Visualizações

Solidificação Direcional e Estabilização de Fase
Materials Engineering
6.6K Visualizações

Calorimetria exploratória diferencial
Materials Engineering
38.0K Visualizações

Difusividade Térmica e Método do Flash de Laser
Materials Engineering
13.3K Visualizações

Galvanoplastia de filmes finos
Materials Engineering
20.2K Visualizações

Análise da Expansão Térmica via Dilatometria
Materials Engineering
15.9K Visualizações

Espectroscopia de Impedância Eletroquímica
Materials Engineering
23.4K Visualizações

Materiais Compósitos de Matriz Cerâmica e Suas Propriedades de Flexão
Materials Engineering
8.3K Visualizações

Ligas Nanocristalinas e Estabilidade de Tamanho de Nano-grão
Materials Engineering
5.2K Visualizações

Síntese de hidrogéis
Materials Engineering
23.8K Visualizações
Copyright © 2025 MyJoVE Corporation. Todos os direitos reservados