Method Article
Подготовка образцов и экспериментальный дизайн для экспериментов по облучению на основе многолучевой просвечивающей электронной микроскопии in situ
В этой статье
Резюме
Методы пробоподготовки изложены с учетом конкретных соображений для экспериментов по ионному облучению in situ методом ПЭМ. Формы ионов, энергия и флюенс обсуждаются вместе с методами их выбора и расчета. Наконец, описываются процедуры проведения эксперимента, которые сопровождаются репрезентативными результатами.
Аннотация
Необходимо понимать материалы, подверженные воздействию перекрывающихся экстремальных сред, таких как высокая температура, радиация или механические нагрузки. Когда эти стрессоры объединяются, могут возникать синергетические эффекты, которые позволяют активировать уникальные механизмы микроструктурной эволюции. Понимание этих механизмов необходимо для ввода и уточнения прогностических моделей и критически важно для разработки материалов следующего поколения. Фундаментальная физика и лежащие в ее основе механизмы требуют исследования с помощью передовых инструментов. Просвечивающий электронный микроскоп (I³TEM) для ионного облучения in situ предназначен для изучения этих принципов.
Для количественного исследования сложных динамических взаимодействий в материалах требуется тщательная подготовка образцов и рассмотрение плана эксперимента. При определенном обращении с образцами или их подготовке можно легко привести к повреждениям или особенностям, которые запутают измерения. Не существует единственно правильного способа подготовки образца; Однако можно допустить много ошибок. Ниже выделены наиболее распространенные ошибки и моменты, которые следует учитывать. I³TEM имеет множество регулируемых переменных и большое потенциальное экспериментальное пространство, поэтому лучше всего планировать эксперименты с учетом конкретного научного вопроса или вопросов.
Эксперименты проводились на большом количестве геометрий образцов, классов материалов и при многих условиях облучения. Ниже приведено подмножество примеров, демонстрирующих уникальные возможности in situ с использованием I3TEM. Наночастицы Au, полученные методом капельного литья, были использованы для исследования эффектов ударов одиночных ионов. Тонкие пленки Au использовались в исследованиях влияния многолучевого облучения на эволюцию микроструктуры. Пленки на основе хрома подвергаются облучению и механическому напряжению для изучения ползучести. Наностолбы Ag были подвергнуты одновременной высокой температуре, механическому сжатию и ионному облучению для изучения ползучести, вызванной облучением. Эти результаты влияют на такие области, как конструкционные материалы, ядерная энергетика, хранение энергии, катализ и микроэлектроника в космических условиях.
Введение
Просвечивающий электронный микроскоп (ПЭМ) широко используется благодаря своей способности наблюдать образцы в наномасштабе. На ранних этапах разработки электронных микроскопов микроскописты определили in situ TEM как мощный инструмент, который может быть использован для непосредственного наблюдения за ролью кристаллических дефектов, кинетических измерений скоростей реакций и фундаментальных механизмов в динамическихпроцессах. Тщательно контролируя окружающую среду и непосредственно наблюдая за материальной эволюцией, можно получить представление о фундаментальных механизмах. Эти знания используются для прогнозного моделирования отклика материалов 2,3, что критически важно в тех случаях, когда традиционные испытания на надежность материалов непомерно сложны; Применение материалов в чрезвычайно удаленных друг от друга, в невероятно агрессивных средах, в течение чрезвычайно долгого времени или в сочетании этих факторов. Радиационная среда является одним из таких примеров, где проведение экспериментальных исследований сопряжено со значительными трудностями из-за опасности радиационных зон, обращения с радиоактивными материалами и длительных временных рамок, необходимых для достижения последствий.
Космические установки и ядерные реакторы являются примерами таких экстремальных радиационных сред. Материалы для атомной энергетики могут подвергаться воздействию нейтронов высоких энергий, а также спектра заряженных частиц высокой энергии. Аналогичным образом, в космических приложениях материалы могут подвергаться воздействию различных заряженных частиц. Понимание и разработка прогностического моделирования эволюции результирующего материала под воздействием этих сложных и экстремальных сред требует понимания фундаментальных механизмов, происходящих на наноуровне. ПЭМ in situ является одним из инструментов для исследования этих динамических наноразмерных механизмов в реальном времени 4,5.
Эксперименты по ионному облучению in situ в ТЭМ начались в 1961 году с случайного излучения ионов O- из загрязненной нити накала вольфрамовых электронов6. Исследователи из Харуэлла были первыми, кто связал ускоритель тяжелых ионов с ПЭМ для прямого наблюдения за эффектами ионного облучения7. В последнее время на нескольких предприятиях были собраны микроскопы с несколькими присоединенными ускорителями ионов для проведения экспериментов по многолучевому ионному облучению in situ, в том числе в Японском научно-исследовательском институте атомной энергии8, Национальном институте материаловедения9, Аргоннской национальной лаборатории10, Университете Хаддерсфилда11, JANNUS Orsay12, Уханьском университете13, Сандийской национальной лаборатории14 и других15 в том числе несколько объектов в стадии разработки. Многолучевое ионное облучение может быть использовано для изучения синергетических эффектов, возникающих при одновременном образовании газа и каскадном повреждении вытеснения в материалах, подверженных воздействию сложных радиационных сред. Ступени ПЭМ с повышенными или криогенными температурами часто используются с многолучевым облучением для более точной имитации конкретных сред, поскольку температура играет значительную роль в развитии дефектов. Кроме того, этапы механических испытаний могут быть использованы для количественной оценки роли синергетических эффектов на изменение механических свойств в зависимости от дозы облучения.
Ионное облучение было использовано в качестве метода ускоренного старения для моделирования каскадного повреждения при атомном смещении, которое происходит во время нейтронного облучения в реакторной среде, поскольку этот метод может обеспечить на много порядков более высокую скорость повреждения, избегая при этом длительной активации целевого материала16. Установка I3TEM в Сандийских национальных лабораториях использует два типа ускорителей, что делает возможным широкий спектр ионов и энергий. Ионный пучок высоких энергий производится тандемным ускорителем мощностью 6 МВ, а ионы низкой энергии — ускорителем Колутрон 10 кВ. Ионы Au до 100 МэВ были получены в тандеме, в то время как колутрон успешно работал с газообразными веществами, включая H, дейтерий (D), He, N и Xe14,17. Смешанная газовая плазма D2 и He может быть использована для проведения тройного ионного облучения пучком тяжелых ионов, поступающим из тандема, и смешанным пучком D2 + He, поступающим из колутрона.
Контролируемое производство ионов позволяет точно дозировать материал для достижения целевого повреждения и концентрации имплантации. При моделировании нейтронного облучения ионным пучком можно рассчитать дозу повреждения в перемещениях на атом (dpa). Это значение представляет собой среднее число смещений атома от его исходного положения в месте решетки и не совпадает с общей концентрацией дефекта. Для расчета общей концентрации дефектов требуются более совершенные инструменты моделирования с возможностью учета эффектов рекомбинации. DPA может быть рассчитан с помощью моделей повреждений от ионного облучения, таких как программное обеспечение для моделирования методом Монте-Карло Stopping Range of Ions in Matter (SRIM)18. SRIM может выводить распределение вакансий, останавливающую способность и диапазоны ионов в мишени в зависимости от состава мишени, ионных соединений и энергии ионов. Это позволяет получить информацию, необходимую для количественной оценки ионной имплантации, радиационного повреждения, распыления, ионного пропускания, а также для медицинского и биологического применения.
При рассмотрении этого инструмента для исследования эффектов облучения важно спланировать эксперимент таким образом, чтобы в полной мере использовать сильные стороны метода. Использование облучения ПЭМ in situ создает идеальный сценарий для количественной оценки динамической эволюции дефектов, создаваемых в радиационной среде. Несмотря на то, что этот метод позволяет получить представление об эволюции дефектов, включая реакции петлевого замыкания/замыкания и механизмы аккомодации границ дефектных зерен (GB), существуют значительные экспериментальные ограничения при сравнении количественного определения дефектов с объемным облучением из-за хорошо известных тонкопленочных эффектов, включая потерю точечных дефектов и кластеров дефектов на поверхности образца19,20.
В данной статье представлены новые соображения и методики подготовки и монтажа образцов для многолучевых экспериментов in situ multibeam TEM. Также описаны соображения по экспериментальному проектированию, включая моделирование и геометрические соображения, специфичные для установки I³TEM, а также протокол выравнивания луча и определения характеристик луча. Приведена демонстрация использования SRIM для расчета энергии, необходимой для заданной глубины ионной имплантации, а также распределения ионов и профиля повреждений. Несмотря на то, что методы моделирования21,22 и некоторые методы подготовки образцов были описаны ранее, здесь подчеркивается применение этой информации к планированию эксперимента. Представлены репрезентативные результаты экспериментов по ПЭМ in situ, а также описан типичный анализ данных.
протокол
ВНИМАНИЕ: Перед использованием ознакомьтесь со всеми соответствующими паспортами безопасности материалов (MSDS). Кроме того, пройдите соответствующее обучение и примите соответствующие меры предосторожности в отношении опасностей, которые могут включать, помимо прочего, используемые химические вещества, высокое напряжение, вакуум, криогены, газы под давлением, наночастицы, лазеры и ионизирующее излучение. Обеспечьте авторизацию и обучение по использованию всего оборудования. Пожалуйста, используйте все соответствующие меры безопасности, продиктованные рабочими процедурами (приборы радиационного контроля, средства индивидуальной защиты и т. д.).
ПРИМЕЧАНИЕ: Все параметры, приведенные в этом протоколе, действительны для указанных здесь приборов и моделей.
1. Экспериментальный дизайн ионного облучения in situ ПЭМ
Примечание: Существует множество переменных, которые могут быть изменены, что приводит к большому потенциальному экспериментальному пространству. Планирование систематических экспериментов таким образом, чтобы они отвечали на конкретные научные вопросы, приведет к наибольшему успеху. Во-первых, выберите подходящие ионные формы и энергии, которые будут моделировать эмулируемую систему.
- Выбор ионных видов
ПРИМЕЧАНИЕ: Взаимодействие ионов с материалами является сложным процессом, и его детали выходят за рамки данного документа. Существует несколько публикаций, подробно описывающих взаимодействие ионов в твердых телах23, а точнее с металлами24 и полупроводниками25. Космическая радиационная среда состоит из спектра энергий и масс ионов, которые могут быть эффективно смоделированы с помощью легких и тяжелых ионов. Ядерные системы могут быть смоделированы с помощью комбинации облучения тяжелыми ионами и газовой имплантации. Облучение тяжелыми ионами имитирует каскадное повреждение смещения, вызванное нейтронами и высокоэнергетическими делениями или продуктами радиоактивного распада. Он часто образуется в ядерных материалах в результате реакций трансмутации или радиоактивного распада.- Выбор элемента для имплантации зависит от химического состава, типа повреждения и соответствующего спектра нейтронов. Чтобы свести к минимуму химические эффекты, связанные с ионной имплантацией, часто используется собственное ионное облучение, при котором выбранный ион совпадает с исследуемым материалом. В качестве альтернативы с помощью допинг-исследований можно выбрать конкретные ионы для имплантации. Тип повреждения определяется кинетической энергией ионов с более высокими энергиями, вызывающими больший ущерб. Для получения фиксированной энергии можно выбрать легкие ионы для создания пар Френкеля, тяжелые ионы — для каскадов повреждений, а самые тяжелые ионы — для ионных треков26.
- Чтобы смоделировать нейтронное повреждение, выберите ион, который соответствует смещениям первичных атомов (PKA) с интересующим ее спектром нейтронов27.
ПРИМЕЧАНИЕ: Не все элементы образуют стабильные отрицательные ионы, пригодные для использования в тандемных ускорителях. На рисунке 1 приведен список всех ионов, успешно работающих в установке I³TEM. Для получения информации о работе ускорителя и списка 6 совместимых элементов MV Tandem со стабильными отрицательными ионами, пожалуйста, обратитесь к поваренной книге Миддлтона28.
- Чтобы смоделировать нейтронное повреждение, выберите ион, который соответствует смещениям первичных атомов (PKA) с интересующим ее спектром нейтронов27.
- Выбор элемента для имплантации зависит от химического состава, типа повреждения и соответствующего спектра нейтронов. Чтобы свести к минимуму химические эффекты, связанные с ионной имплантацией, часто используется собственное ионное облучение, при котором выбранный ион совпадает с исследуемым материалом. В качестве альтернативы с помощью допинг-исследований можно выбрать конкретные ионы для имплантации. Тип повреждения определяется кинетической энергией ионов с более высокими энергиями, вызывающими больший ущерб. Для получения фиксированной энергии можно выбрать легкие ионы для создания пар Френкеля, тяжелые ионы — для каскадов повреждений, а самые тяжелые ионы — для ионных треков26.

Рисунок 1: Ионы на сегодняшний день (выделены синим цветом), состояния заряда и диапазоны энергий в I³TEM. Пожалуйста, нажмите здесь, чтобы просмотреть увеличенную версию этой цифры.
- Выбор энергии ионов с помощью таблиц остановок и дальностей в SRIM
ПРИМЕЧАНИЕ: Таблицы остановок и диапазонов обеспечивают быстрый метод определения глубины проникновения ионов в материал. Останавливающая способность, dE/dx, описывает энергию (dE), которую ион теряет на единицу расстояния (dx), пройденного в твердом теле. Останавливающая способность состоит из двух компонентов: 1) ядерной остановки, энергии, потерянной при упругих столкновениях с атомами-мишенями, и 2) электронной остановки, энергии, потерянной из-за взаимодействия с электронами атома-мишени. В следующей процедуре описывается реализация типичной таблицы SRIM.- В программном обеспечении SRIM выберите таблицы остановок / диапазонов.
- Выберите ион, который необходимо имплантировать, и целевой материал. Для составной мишени можно выбрать несколько целевых элементов.
ПРИМЕЧАНИЕ: Расчетная плотность предоставляется, но обычно она очень неточна, и значение должно быть введено вручную. - Выберите «Вычислить таблицу », чтобы увидеть таблицу энергий ионов в зависимости от прогнозируемого диапазона, бокового и продольного смещения в материале.
ПРИМЕЧАНИЕ: Для экспериментов по имплантации пиковый диапазон остановки должен находиться в пределах толщины фольги. - Энергии выше 6 МВ возможны при нескольких состояниях заряда. Где энергия ионов E приблизительно определяется как:
 Уравнение (1)
Уравнение (1)
Где M1 — масса выбранного иона, MT — общая масса соединения в источнике (MT = M1 для одноэлементных источников), q — состояние заряда, V T — напряжение на выводах и VS — потенциал источника.
Примечание: Зарядовые состояния также влияют на ток пучка, который влияет на достижимый флюенс и время воздействия для экспериментов (см. уравнения 2, 3).
- Выбор флюенса и потока ионов с помощью SRIM
ПРИМЕЧАНИЕ: Проверьте профиль глубины проникновения для энергии, используемой в 1.2, с помощью SRIM. Примите решение о целевой концентрации ионов (доза, флюенсе) или уровне повреждения на основе соответствующей литературы. Уровень повреждения часто указывается в dpa и не отражает итоговое количество дефектов, а представляет собой среднее количество смещений без учета аннигиляции дефектов на свободных поверхностях или рекомбинации. Другие условия окружающей среды, такие как температура или механическая нагрузка, могут применяться одновременно. Они могут влиять на повреждения и механизмы микроструктурной эволюции, и их следует учитывать. Ниже приведено описание того, как использовать SRIM для расчета урона или флюенса. Существуют альтернативные методы расчета ущерба22, но описанный способ широко используется и считается более простым и быстрым. Настоятельно рекомендуется следовать этим рекомендациям для соответствующих условий излучения и, что наиболее важно, записывать и сообщать о параметрах моделирования таким образом, чтобы их можно было воспроизвести.- В программном обеспечении SRIM выберите ион, который необходимо имплантировать, и целевой материал. Для составной мишени можно выбрать несколько целевых элементов. Расчетная плотность предоставляется, но обычно она очень неточна, и значение следует вводить вручную.
- Выберите тип расчета TRIM: "Распределение ионов и быстрый расчет урона" и модель повреждения "Quick K-P".
Примечание: Метод vacancy.txt обеспечивает быструю аппроксимацию профиля повреждений, достаточную для планирования большинства экспериментов I3TEM. Столлер и др.21 подробно описывают, как использовать SRIM для реализации уравнения Кинчина-Пиза для определения dpa на ион на площадь в металлических системах. Существуют конкурирующие аргументы в пользу использования вариантов «быстрый K-P» против «полного каскада»21,22, особенно в ионных соединениях, содержащих элементы с различными пороговыми энергиями смещения. Авторы рекомендуют исследовать каждый из этих методов, чтобы определить наиболее подходящий метод расчета для представления итогового dpa в публикациях в зависимости от конкретного типа выборки и дизайна эксперимента. - Задайте толщину слоя, равную толщине образца ПЭМ (10\u2012150 нм).
ПРИМЕЧАНИЕ: Программное обеспечение автоматически разделит глубину на 100 бункеров одинакового размера, поэтому выбор большей толщины приведет к менее точному биннингу. - Установите угол падения ионов в соответствии с экспериментальными условиями (обычно 60° от нормы).
ПРИМЕЧАНИЕ: Ионный пучок почти перпендикулярен электронному пучку в ПЭМ, и обычно образец наклонен в сторону ионного пучка на 30°. Схемы экспериментальной конфигурации см. в разделах 3 и 4. - Выберите энергию порогового смещения из авторитетного литературного источника, например ASTM E52129. Установите энергию решетки и поверхности равной нулю.
Примечание: В публикациях, посвященных моделированию30 и экспериментальной работе31 , представлены пороговые энергии смещения на различных материалах. Нулевая решетка и поверхностная энергия подходят для большинства условий, но для особых случаев может потребоваться указать значение21. - Запустите симуляцию.
- Проверьте файл VACANCY.txt на наличие повреждений в зависимости от глубины, как ВАКАНАЦИИ по ИОНАМ, так и ВАКАНСИИ по ОТДАЧАМ для каждой глубины. Этот файл можно импортировать в электронную таблицу.
ПРИМЕЧАНИЕ: Использование файла vacancy.txt может быть не самым точным методом расчета дозы урона и должно рассматриваться как быстрое приближение21. - Конвертируйте единицы измерения из (смещения/ион-Å) в (смещения/ион·см). Затем используйте измеренное флюенс ионов для определения dpa или определения необходимого флюенса ионов для желаемого dpa (Уравнение 2, см. разделы 3.1.5 и 3.2.5 для измерения флюенса). Если требуется коэффициент повреждения (dpa/s), замените флюенс на флюенс (ионы/см2-с).
 Уравнение (2)
Уравнение (2) - Рассчитайте время воздействия, необходимое для целевого флюенса.
Примечание: Ниже приведены соотношения между этими величинами, где e — заряд электрона, а C — кулонов (уравнение 3). Некоторые эксперименты охватывают несколько десятилетий флюенса и, таким образом, соизмеримый диапазон времен с данным потоком. Для экспериментов с высоким флюенсом желателен максимальный поток, чтобы свести к минимуму время эксперимента24. Из-за предельной скорости задвижек и чашечного привода Фарадея низкий флюенс требует меньшего потока, чтобы время воздействия могло быть достигнуто с достаточной точностью: по шкале секунд. Высокий ток пучка может привести к локальному нагреву образца, что может изменить диффузионные свойства и наблюдаемую микроструктурную эволюцию. В экспериментах с использованием большого тока пучка образец следует охлаждать до комнатной температуры, а температуру контролировать с помощью термопар во время облучения.
 (Уравнение 3)
(Уравнение 3)
- Выбор стадии ПЭМ
ПРИМЕЧАНИЕ: Простые эксперименты по ионному облучению могут быть выполнены на одном наклонном держателе. Однако, в зависимости от системы материалов и интересующих свойств, могут быть уместны различные держатели. Одновременно с ионным облучением можно комбинировать различные компоненты экстремальных условий, включая такие условия, как температура, газовая или жидкая среда, а также механические нагрузки.- Рассмотрите возможность использования криогенных или нагревательных держателей. Температура играет важную роль в диффузии атомов. Температура имплантации может влиять на тип и интенсивность повреждения. Для поддержания желаемой температуры можно выбрать криодержатели или нагревательные держатели. Поддерживайте температуру в помещении с помощью нагревательного держателя, в котором работает охлажденная вода.
ПРИМЕЧАНИЕ: Для высокотемпературных экспериментов образцы должны быть установлены на сетку Mo или другие термостабильные решетки. - Рассмотрите возможность использования двойных наклонных или томографических держателей. Ориентация кристалла может быть важна для понимания и необходима для получения двух условий луча, способствующих количественной оценке петель дислокаций или плотностей черных пятен. В этих случаях можно использовать двойные наклонные или томографические держатели. Это также было бы полезно для изучения радиационно-индуцированных фазовых переходов.
- Рассмотрите возможность использования держателей для воздействия на материал газа или жидкости на месте. Подготовка образцов для такого рода экспериментов варьируется, может быть очень сложной и выходит за рамки настоящего документа32.
- Рассмотрите возможность использования ступеней, специализированных для механических испытаний, включая растяжение, сжатие, изгиб, усталость и ползучесть.
ПРИМЕЧАНИЕ: Для проведения таких экспериментов требуется специальная подготовка образцов, которая выходит за рамки настоящего документа 33,34,35,36. Теперь, когда определены ионные формы, энергия ионов и флюенс мишени, а также рассмотрены конкретные держатели для дополнительной сложности окружающей среды, следующим шагом в планировании экспериментов по ионному облучению является подготовка образцов для ПЭМ. Требуется тщательная подготовка образца для удовлетворения геометрических ограничений для экспериментов in situ по ионному облучению ПЭМ. Ниже описаны несколько методов подготовки образцов.
- Рассмотрите возможность использования криогенных или нагревательных держателей. Температура играет важную роль в диффузии атомов. Температура имплантации может влиять на тип и интенсивность повреждения. Для поддержания желаемой температуры можно выбрать криодержатели или нагревательные держатели. Поддерживайте температуру в помещении с помощью нагревательного держателя, в котором работает охлажденная вода.
2. Подготовка тонкого образца и монтаж на сетку ПЭМ
ПРИМЕЧАНИЕ: Существует множество способов подготовки образца к ПЭМ. Выбор наиболее подходящего метода зависит от геометрии исходного образца, материала и интересующих особенностей. С обширным перечнем и описанием методов подготовки можно ознакомиться в руководстве по подготовке образцов для ПЭМ37. Ниже описаны три распространенных метода. Для магнитных материалов следует применять метод склеивания таким образом, чтобы пленки или частицы не отрывались при воздействии магнитного поля в ПЭМ. Следует избегать изоляционных подложек (т.е. оксидов), чтобы свести к минимуму электростатическое излучение из-за заряда, индуцированного ионным пучком.
- Капельное литье наночастиц
ПРИМЕЧАНИЕ: Это самый простой метод подготовки образцов методом ПЭМ для наночастиц диаметром менее 200 нм. Можно использовать несколько различных вспомогательных материалов, включая мембраны из карбона, полимера и нитрида кремния. Эти материалы могут по-разному взаимодействовать с наночастицами из-за лигандных взаимодействий. Выберите ту подложку, в результате которой получаются хорошо диспергированные наночастицы.- Диспергируйте наночастицы в растворителе, таком как спирт, деионизированная вода или другая комбинация, до тех пор, пока они хорошо не перемешаются. Ультразвуковая обработка может быть использована для дробления дополнительных агломератов. Концентрация жидкости может быть использована для контроля плотности наночастиц на сетке.
- С помощью пипетки дисперсные частицы наносятся на верхнюю сторону поддерживаемой сетки ПЭМ.
ПРИМЕЧАНИЕ: Убедитесь, что опорная сторона сетки обращена вверх, чтобы наночастицы прилипли к верхней стороне сетки. Можно воспользоваться капиллярным эффектом, который притягивает наночастицы по мере высыхания капли. Смещение от центра приведет к снижению плотности наночастиц в центральной области облучения.
- Тонкопленочный флоат-офф
ПРИМЕЧАНИЕ: Для этого метода требуется тонкая (<100 нм) пленка, нанесенная на растворимую подложку, такую как соль или фоторезист. Небольшую часть образца расщепляют и помещают в растворитель. По мере того, как подложка растворяется в растворителе, тонкая пленка отделяется от подложки и всплывает на поверхность раствора, где ее можно зачерпнуть на сетку ПЭМ.- Приготовьте 50 мл растворителя в чашке Петри.
ПРИМЕЧАНИЕ: Растворитель зависит от подложки для тонкой пленки. Субстраты NaCl распространены, растворителем которых является вода. В раствор можно добавить спирт для изменения поверхностного натяжения. Слишком большое количество алкоголя часто приводит к тому, что образец тонет, а слишком малое количество алкоголя увеличивает поверхностное натяжение, затрудняя перенос пленки на сетку. - Расщепите или разрежьте основание примерно на участки по 1,5 мм × 1,5 мм.
ПРИМЕЧАНИЕ: Края пленки обычно имеют более низкое качество, и их следует по возможности избегать. - С помощью пинцета вставьте подложку пленкой вверх в раствор под углом падения около 30° (рисунок 2а). Многократно втяните и медленно вставляйте, пока пленка не освободится (Рисунок 2b, c). Субстрат можно отложить в сторону.
- Вставьте в раствор сетку ПЭМ и занесите вниз пленку. Медленно поднимайте сетку под пленкой, пока пленка не будет центрирована над сеткой. Быстро поднимите сетку из раствора и пленка прилипнет (Рисунок 2d).
ПРИМЕЧАНИЕ: Если пленка плохо отцентрирована, снова вставьте сетку и пленку в раствор, чтобы снова всплыть пленку и центрировать по мере необходимости. Имейте в виду, что пленка может сложиться сама по себе.
- Приготовьте 50 мл растворителя в чашке Петри.
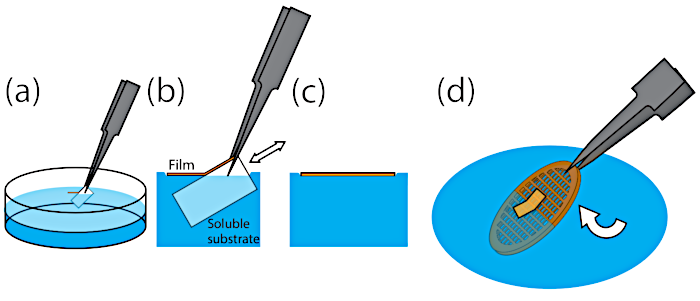
Рисунок 2: Тонкая пленка. Схема, показывающая (а) вставку участка тонкой пленки, нанесенной на растворимую подложку, в растворитель в растворитель, (б) вид поперечного сечения отплытия от тонкой пленки путем растворения адгезионного слоя подложки, (в) вид поперечного сечения тонкой пленки, свободно плавающей на растворе под действием поверхностного натяжения, и (г) использование сетки ПЭМ для подъема пленки из раствора. Пожалуйста, нажмите здесь, чтобы просмотреть увеличенную версию этой цифры.
- Фрезерование сфокусированным ионным пучком
ПРИМЕЧАНИЕ: Большинство сыпучих материалов могут быть получены путем измельчения с помощью сфокусированного ионного пучка (FIB), а подробную информацию об этом процессе можно найти в руководстве по подготовке образцов TEM37. Фрезерование FIB является трудоемким и сложным процессом по сравнению с упомянутыми ранее методами, но очень коротким и простым по сравнению с традиционными методами ручной полировки для подготовки образцов TEM из объемных образцов. Его преимущество также заключается в высокой степени контроля над участком, что позволяет выбрать область интереса для исследования, такую как границы или дефекты. Фольга, изготовленная с помощью FIB, имеет повреждения от остаточного ионного облучения, вызванные процессом ионно-лучевого фрезерования, что позволяет провести количественную оценку повреждений, вызванных облучением in situ38.- Подготовьте подъемник. Для производства ПЭМ-пленок различной геометрии с учетом специфики участка можно использовать различные стратегии подъема. Для получения подробной информации о методах обратитесь к публикациям по подготовке образцов в геометрических формах, таких как: поперечное сечение39, вид в плане40, вершины трещин41, наностойки42, иглы атомного зонда43 и т.д.
- Закрепите фольгу. Подъемные отверстия ex situ могут быть размещены поверх сетки TEM аналогично тонким пленкам (Рисунок 3a). Для образцов, приваренных к сетке, фольга должна быть приварена к кончику стойки на лицевой стороне сетки, чтобы избежать эффекта затенения (Рисунок 3b). Избегайте монтажа в V-образных стойках (Рисунок 3b: слева и справа).
- Выполните окончательную полировку ламели. Стандартное утончение FIB приведет к повреждению образца ионным пучком. Эти повреждения могут быть сведены к минимуму за счет полировки вровень с очень маленьким углом скольжения и щадящего фрезерования с низким ускоряющим напряжением. Альтернативой традиционному окончательному утончению с помощью ионного пучка Ga+ является мгновенная электрополировка44,45 и ионное фрезерование с помощью Ar+46.
- Электрополировка
ПРИМЕЧАНИЕ: Этот метод часто является наиболее предпочтительным методом подготовки однофазных металлических образцов для экспериментов по ионно-лучевому облучению in situ из сыпучих материалов. Это позволяет избежать повреждений, вызванных фрезерованием FIB и традиционными методами полировки. Однако раствор электролита, электрический потенциал и время полировки зависят от материала, и эти параметры может быть трудно определить.

Рисунок 3: Схема, показывающая сетки ПЭМ с образцами, установленными на верхней поверхности для предотвращения затенения. Сетка с кружевным карбоном или тонкой пленкой (a), полулунная сетка с подъемным FIB, приваренным к наконечнику (b). Пожалуйста, нажмите здесь, чтобы просмотреть увеличенную версию этой цифры.
3. Условия ионного пучка и юстировка
- Тандемный ускоритель
ПРИМЕЧАНИЕ: Тандемный ускоритель лучше всего подходит для ионов высоких энергий 800 кэВ – 100 МэВ. Источники отрицательных ионов методом цезиевого распыления (SNICS) часто используются для получения энергичных пучков ионов металлов, и их эксплуатация выходит за рамки настоящего документа28. Корректировки и соображения для экспериментов in situ TEM описаны ниже.- Выровняйте ионный пучок внутри ПЭМ с помощью направляющих магнитов, изгибающихся магнитов и линз так, чтобы события облучения можно было наблюдать на месте. Выполняйте окончательную юстировку ионного пучка с помощью камеры для просмотра индуцированной ионным пучком люминесценции (IBIL) на держателе образцов TEM с кварцевым наконечником.
- Выровняйте ионный пучок так, чтобы он совпадал с катодолюминесценцией, создаваемой электронным пучком, с согласованием мощности линзы объектива электронного пучка, используемым в эксперименте.
- Вставьте чашку Фарадея перед ПЭМ, чтобы захватить ионный пучок, и снимите показания, чтобы измерить ток пучка. Для расчета флюенса необходимо измерить ток луча (уравнение 3).
- Для повышения точности измерения тока пучка вставьте держатель ПЭМ, оснащенный каскадом Фарадея, для измерения тока ионного пучка в области образца ПЭМ.
- Если необходимо контролировать ток в режиме реального времени, используйте монитор профиля луча (BPM). Включите BPM, затем контролируйте показания осциллографа для выполнения текущих измерений. BPM работает путем регулярного прерывания луча, что приводит к временному искажению луча и является качественной мерой тока луча.
ПРИМЕЧАНИЕ: Ток ионного пучка может дрейфовать, поэтому рекомендуется проверять его стабильность на протяжении всего эксперимента.
- Измерьте площадь луча с помощью точки гари. Точки ожога могут быть использованы для подтверждения выравнивания в версии 3.1.1.
- Закрепите кусок прозрачной клейкой ленты на плоский наконечник плоской пластины держателя образца TEM с одним наклоном и подвергните воздействию электронного пучка и ионного пучка. Снимите скотч и поместите его на белый фон.
- Чтобы определить область, сфотографируйте место гари с помощью линейки и импортируйте его в программное обеспечение для обработки изображений, такое как ImageJ47. Вместе с током пучка измерение площади пучка может быть использовано для определения потока ионов (уравнение 2).
- Вставьте калибровочный образец для визуализации повреждения луча, которое должно проявляться как контраст черного пятна в кинематических условиях яркого поля. Как правило, Au или CuAu выбирают из-за их легко заметного образования черных пятен и простоты подготовки образцов48.
- Выровняйте ионный пучок внутри ПЭМ с помощью направляющих магнитов, изгибающихся магнитов и линз так, чтобы события облучения можно было наблюдать на месте. Выполняйте окончательную юстировку ионного пучка с помощью камеры для просмотра индуцированной ионным пучком люминесценции (IBIL) на держателе образцов TEM с кварцевым наконечником.
- Колутронный ускоритель
ПРИМЕЧАНИЕ: В ускорителе Colutron используется источник ионов горячей нити49 с подачей газа. Можно ускорить несколько газовых соединений одновременно, однако отношение массы к заряду двух ионов должно быть одинаковым, чтобы изгибающий магнит, рулевые устройства и линзы действовали одинаково; например, 4He2+ и 2D1+.- Выполните расчеты SRIM, как описано в разделе 1.2, чтобы получить желаемую энергию имплантации газа.
ПРИМЕЧАНИЕ: Необходимая прочность изгибающего магнита зависит от массы иона, его заряженного состояния и ускоряющего напряжения. Если разновидность газа имеет несколько изотопов, выбор наиболее распространенного приведет к наибольшему току луча. Также обратите внимание, что если Тандем активен, этот изгибающий магнит также будет воздействовать на его луч; дополнительные поправки для тандема должны быть сделаны после того, как луч Колутрона будет выровнен. - Направьте пучок ионов таким образом, чтобы он совпадал с электронным пучком, как описано в шаге 3.1.1.
- Измерьте ток луча, как описано в шаге 3.1.2.
- Оцените площадь луча с помощью точки горения, как описано в шаге 3.1.3.
ПРИМЕЧАНИЕ: Этот шаг может быть выполнен одновременно с измерением ионного пучка от тандемного ускорителя. Однако, если ток луча от ускорителя Колутрон слишком велик по сравнению с током от Тандема (> 3 порядка), то он закроет сигнал и измерения следует проводить отдельно. - Выполните окончательную регулировку для направления луча на образец ПЭМ, как описано в шаге 3.1.4.
- Выполните расчеты SRIM, как описано в разделе 1.2, чтобы получить желаемую энергию имплантации газа.
4. Условия загрузки ПЭМ и визуализации

Рисунок 4: Условия нагрузки ПЭМ и визуализации. Вид сверху держателя ПЭМ с направлением электронного луча на страницу с наклоном держателя на 30° в положительном X (a) и отрицательном X (c). Вид поперечного сечения вниз по оси держателя с электронным пучком (зеленый) и ионным пучком (синий) выделен держателем, наклоненным на 30° в положительном X (b) и отрицательном X (d) для нижнего бокового освещения ионного пучка. Выделенная область, где электронный и ионный пучки не затенены. Пожалуйста, нажмите здесь, чтобы просмотреть увеличенную версию этой цифры.
- Нагрузка на образец и геометрические проблемы
- Загрузите сетку на держатель таким образом, чтобы сторона образца сетки была обращена вверх, а сетка была ориентирована таким образом, чтобы предотвратить эффект затенения при наклоне к ионному пучку (Рисунок 4a, c).
ПРИМЕЧАНИЕ: На рисунке 4b, d изображена схема пути ионных пучков и траектории электронного пучка в конфигурации облучения, где выделена эффективная экспериментальная область. - Проверьте эффекты затенения с помощью оптического микроскопа. Наклоните держатель на 30° в положительном направлении X, как показано на рисунке 4a, b. Вид сверху будет параллельен электронному лучу. Наклоните держатель на 60° в отрицательном направлении X, где вид сверху будет параллельен обзору ионного луча. Если интересующая область образца не видна в обеих ориентациях, возникает проблема затенения и образец необходимо переместить.
ПРИМЕЧАНИЕ: Для некоторых держателей нижняя часть предметного столика имеет меньше проблем с затенением, поэтому наклон на отрицательные 30°, чтобы ионный луч попадал на нижнюю сторону образца, может быть оптимальным (Рисунок 4d). - Установите образец на держатель TEM в соответствии с инструкциями производителя для конкретного держателя. Загрузите держатель в TEM, чтобы начать цикл насоса. Подождите, пока вакуум стабилизируется, и вставьте держатель.
ПРИМЕЧАНИЕ: При погрузке и разгрузке держателей в ТЕА клапан для линии луча должен быть закрыт во избежание воздействия на линию луча любых вызванных нагрузкой столкновений с вакуумом в ТЕА. - В управляющем программном обеспечении TEM загрузите самый последний файл выравнивания для используемого ускоряющего напряжения. Вручную уточните выравнивание линзы конденсора и диафрагмы, наклона и сдвига пистолета, а также линзы объектива.
- Найдите интересующую область на образце и настройте условия визуализации, как описано Jenkins and Kirk50 для типа выполняемого анализа. Используйте кинематические условия светлого поля для отображения событий повреждения.
ПРИМЕЧАНИЕ: Для материалов с высоким числом Z, таких как вольфрам, может быть задействована дополнительная конденсорная линза для дополнительной яркости.
Примечание: Материалы с низким коэффициентом Z могут быть вытеснены электронами высокой энергии, что приводит к повреждениям от электронного пучка, которые могут запутать повреждения, вызванные ионами51. Использование низкой дозы электронного пучка и ограничение воздействия на образец, а также использование сканирования ПЭМ с малым временем пребывания помогут смягчить эту проблему. - Наклоните держатель на максимально безопасное расстояние (30° для большинства держателей) до 81° в сторону ионного луча.
- Применяйте любые дополнительные факторы напряжения, такие как нагревательные, охлаждающие, экологические, механические и т.д., используя рекомендованные производителем процедуры, характерные для выбранного держателя ПЭМ.
ПРИМЕЧАНИЕ: Для работы с большим увеличением дайте время для стабилизации сцены, чтобы дрейф не был значительным. Приложенные факторы напряжения также могут привести к деформации образца. - Откройте клапан ионного пучка ПЭМ и снимите чашку Фарадея, чтобы подвергнуть экспериментальный образец ионному облучению. Приостановите выдержку, вставив чашку Фарадея и закрыв клапаны в линию пучка. Чашку Фарадея следует вставлять перед закрытием клапана ПЭМ, чтобы предотвратить повреждение клапана.
ПРИМЕЧАНИЕ: Давление пистолета в TEM должно контролироваться таким образом, чтобы оно не превышало пороговое значение, указанное производителем для безопасных уровней эксплуатации. Может потребоваться остановить воздействие для восстановления вакуума, если образец или столик производят значительное выделение газов во время воздействия ионного пучка. - Записывайте изображения или видео, чтобы задокументировать эволюцию микроструктуры.
- Загрузите сетку на держатель таким образом, чтобы сторона образца сетки была обращена вверх, а сетка была ориентирована таким образом, чтобы предотвратить эффект затенения при наклоне к ионному пучку (Рисунок 4a, c).
- Дополнительные режимы визуализации
- Для картирования относительной ориентации зерен используйте автоматизированное картирование ориентации кристаллов (ACOM), метод, который позволяет идентифицировать кристаллографическую ориентацию всех кристаллитов с размерами до 10 нм. Программные системы автоматизируют сбор дифракционных картин с прецессированным пучком, которые индексируются в результате создания карты ориентации52.
- Для сверхбыстрых соревнований используйте высокоскоростной дефлектор. Это магнитная линза, которая отклоняет проецируемые электроны в разные квадранты камеры с высокой скоростью, эффективно увеличивая время кадра на порядок. Он может быть использован для захвата событий, происходящих в микросекундном масштабе времени в одном кадре53.
- Выполните электронную томографию путем захвата наклонной серии образца и затем выполните реконструкцию с помощью программного обеспечения. Это позволяет выявить трехмерную структуру образца и может быть использовано для анализа объемных распределений54.
- Выполняйте измерения электронной голографии путем захвата серии снимков со сквозной фокусировкой. Это измерение может быть использовано для различения пустот, пузырьков и наночастиц55.
- Используйте темное поле слабого луча для просмотра дислокаций и повреждений, вызванных ионным пучком. Двухлучевое условие для монокристалла используется для измерения характера дислокаций и плотности50.
Результаты
Эксперименты по ионному облучению in situ проводились на нескольких системах материалов и с использованием нескольких различных методов подготовки образцов 14,32,56,57,58,59,60,61,62,63,64,65,66,67, 68,69,70, 71,72,73,74,75. Ниже приведены несколько выбранных систем, которые демонстрируют это разнообразие. Методы подготовки образцов включают литье наночастицами, откат тонких пленок, подъем FIB в поперечном сечении на сетке в форме полумесяца, фольгу push-to-pull и наностойки.
Здесь представлен эксперимент по изучению влияния одиночных ионных ударов на наночастицы Au (НЧ)60. Количественная плотность частиц в окне облучения контролировалась с помощью капиллярных сил, которые тянут НЧ за собой при высыхании капли. Опускаясь от центра, капля притягивает NP к краю диска по мере его высыхания. Активные механизмы повреждения можно выделить, взяв разницу до и после события (рис. 5). Измерения выявили несколько механизмов повреждений, вызванных облучением одиночными ионами, включая образование поверхностных кратеров, распыление, образование нитей и фрагментацию частиц, где типы повреждений зависят от энергии ионов. Образование нитей наблюдается при более низких энергиях ионов, в то время как образование кратеров, распыление и фрагментация частиц наблюдаются при высоких энергиях ионов. Эти различные энергетические режимы могут быть использованы для исследования эффектов электронной и ядерной останавливающей способности.
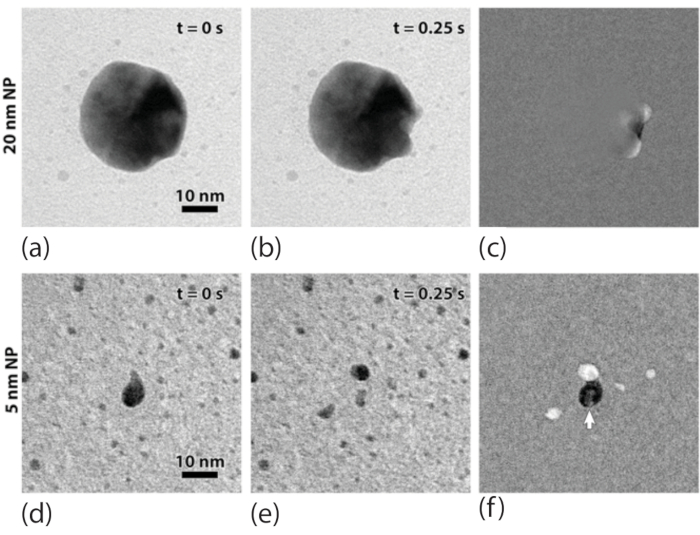
Рисунок 5: Эффекты одиночных ионов с энергией 46 кэВ в НЧ уменьшающегося размера. Обратите внимание, что увеличение одинаково для всех микрофотографий. Каждая пара микрофотографий разделена 1 кадром, здесь примерно 0,25 с. (а–в) Одиночный удар ионов в НЧ с длиной волны 60 нм создал поверхностный кратер, отмеченный белой стрелкой. На панели (c) показано изображение разницы, подчеркивающее разницу между (a) и (b); Объекты, присутствующие только на (a), темные, а вновь образованные объекты, присутствующие только на (b), кажутся светлыми. (г–ж) Одиночный ион, создающий кратер в НЧ с длиной волны 20 нм. На панели (f) показано изображение разницы между (d) и (e). Эта цифра была изменена с разрешения Cambridge University Press60. Пожалуйста, нажмите здесь, чтобы просмотреть увеличенную версию этой цифры.
Нанокристаллические тонкие пленки Au были подготовлены для многолучевых экспериментов in situ с помощью ПЭМ. Образцы осаждали методом импульсного лазерного осаждения на подложки NaCl, а затем упускали в деионизированной воде на сетки Mo TEM. Образцы отжигали в вакуумной печи при 300 °C в течение 12 ч для расслабления осажденной метастабильной нанокристаллической структуры, в результате чего получалось поликристаллическое золото с ультрамелкими зернистыми размерами.
В этом исследовании для моделирования нейтронного облучения используются ионы Au4+ с энергией 2,8 МэВ. Энергия выбирается на основе моделирования SRIM таким образом, чтобы она приводила к пиковому повреждению в толще пленки (Рисунок 6a). Одновременный He+ с энергией 10 кэВ моделирует рождение α-частиц в результате ядерных реакций, индуцированных нейтронным излучением. Энергия ионов He выбирается таким образом, чтобы ионы имплантировались в толщину фольги, а не проходили через нее (рис. 6b).
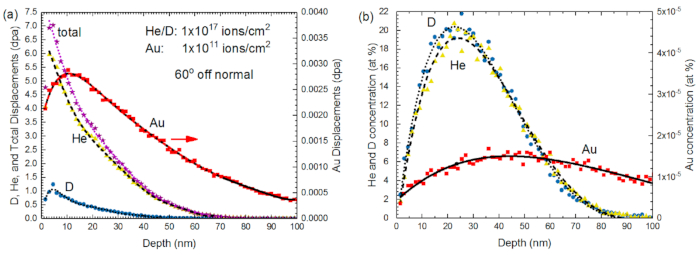
Рисунок 6: Моделирование SRIM. SRIM рассчитал (a) профили смещения и (b) концентрации в зависимости от глубины для Au, облученного различными формами ионов. Общий профиль dpa (D + He + Au) обозначен фиолетовыми звездами в (a). Линии посадки являются ориентиром для глаза. Этот рисунок был изменен с разрешения MDPI17. Пожалуйста, нажмите здесь, чтобы просмотреть увеличенную версию этой цифры.
Затем материал облучали ионами Au, и наблюдались повреждения в отношении флюенса. В микроструктуре образовались дефекты, индуцированные ионами высоких энергий (рис. 7). С увеличением времени воздействия и, следовательно, флюенса, урон увеличивался линейно. При высоких дозах концентрация мест повреждения слишком высока для надежной количественной оценки.
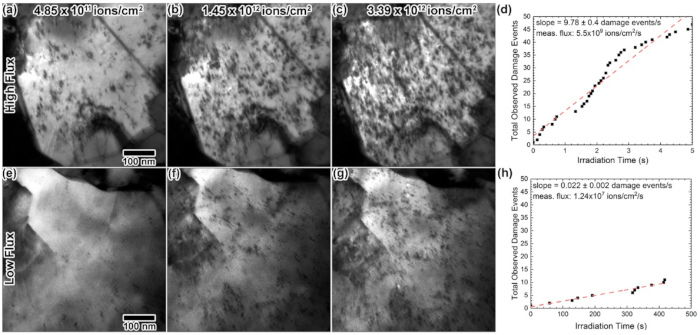
Рисунок 7: Изображения ПЭМ с указанием мест повреждений. ПЭМ-изображения от облучения in situ 2,8 МэВ Au4+ в Au фольгу с мощностью дозы 9,69 ×10 10 (a–c) и 9,38 × 108 ионов/см2·с (e–g) при флюенсах 4,85 × 108, 1,45 × 1012 и 3,39 × 1012 ионов/см2. (d,h) показывают линейное увеличение количества зон повреждения с течением времени. Все снимки ПЭМ были получены с одинаковым увеличением. Этот рисунок был изменен с разрешения MDPI17. Пожалуйста, нажмите здесь, чтобы просмотреть увеличенную версию этой цифры.
Чтобы исследовать эффекты одновременного взаимодействия нескольких пучков с материалом, затем выполняется облучение двойным и тройным пучком ионов на Au (рис. 8). Измеряется зарождение, рост и эволюция полости.
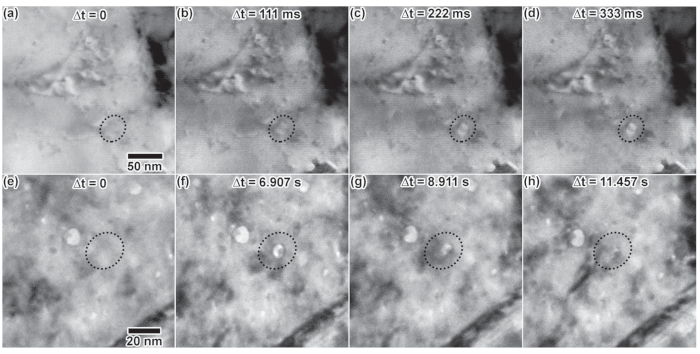
Рисунок 8: Изображения ПЭМ in situ, показывающие рост полости. ПЭМ-изображения in situ, показывающие рост полости в зависимости от времени за счет облучения двойными ионами (a–d) 5 кэВ D + 1,7 МэВ Au и образование и коллапс полости в зависимости от времени под действием тройного ионного облучения (e–h) 10 кэВ He, 5 кэВ D и 2,8 МэВ Au. Пунктирные круги выделяют интересующую полость на каждом изображении. Этот рисунок был изменен с разрешения MDPI17. Пожалуйста, нажмите здесь, чтобы просмотреть увеличенную версию этой цифры.
Для исследования радиационно-индуцированной ползучести в Zr было изготовлено устройство микроэлектромеханической системы (MEMS) путем осаждения тонких пленок Zr на кремниевых пластинах изолятора с последующим фотолитографическим моделированием и последующим глубоким реактивным ионным травлением. На Иллюстрации 9 показан отдельно стоящий образец Zr и испытательная рама Si push-to-pull, которая позволяет проводить испытания на растяжение in situ. Ионы Zr с энергией 1,4 МэВ использовали для облучения образца под нагрузкой для определения ползучести облучения в Zr. Проводя эксперимент в ПЭМ, можно наблюдать динамические механизмы на наноуровне. Измерения показывают изменение текстуры, а также удлинение образца. Объемное набухание не ожидалось из-за геометрии образца из тонкой фольги, условий комнатной температуры и низкого уровня повреждения от облучения. Это подтверждается отсутствием наблюдаемого образования пузырьков и полостей.
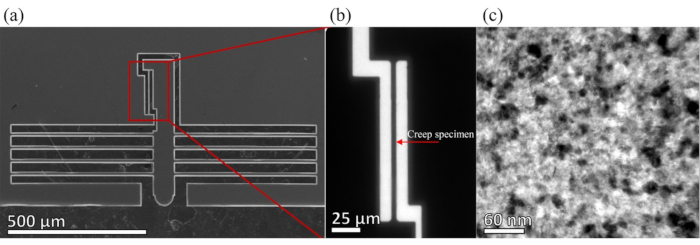
Рисунок 9: Механические испытания на месте. а) СЭМ-изображение двухтактного устройства с выделением места расположения образца на растяжение Zr. b) ТЕУМ-изображение устройства с малым увеличением из подпункта а). (c) Светлопольное ПЭМ-изображение нанокристаллической микроструктуры Zr в тестовой области с большим увеличением. Эта цифра была изменена с разрешения Springer Nature75. Пожалуйста, нажмите здесь, чтобы просмотреть увеличенную версию этой цифры.
Дополнительные механические стрессорные состояния могут быть применены одновременно во время экспериментов по ионному облучению in situ ПЭМ. На рисунке 10 показана работа по индуцированной высокотемпературным облучением ползучести наностолбов Ag67. При этом используется пиковендентор для приложения контролируемого напряжения к образцу ПЭМ. Столбы получали из пленки Ag толщиной 1 мкм, выращенной на Si методом FIB-фрезерования. Столбы облучались ионами Ag³+ с энергией 3 МэВ. Образцы нагревали лазерным лучом с длиной волны 1064 нм, совпадающим как с ионным пучком, так и с электронным пучком. Результаты этого исследования показывают, что комбинированное облучение и температура приводят к увеличению скорости ползучести на порядки выше, чем при облучении при комнатной температуре и высокотемпературном тепловом ползучести.
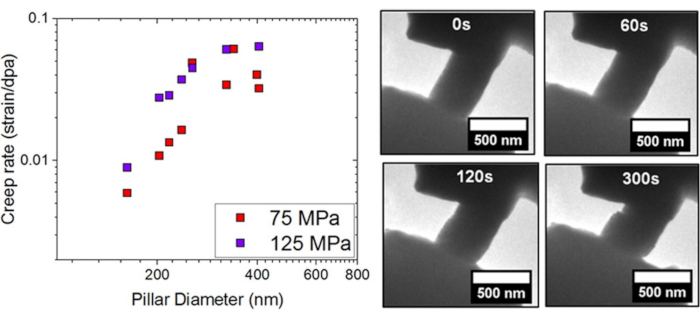
Рисунок 10: Радиационно-индуцированная ползучесть. Радиационно-индуцированная скорость ползучести в зависимости от диаметра столба при нагруженных напряжениях 75 и 125 МПа (слева), выбранные кадры из видеозаписи in situ индуцированной излучением ТЭМ ползучести в наностолбе Ag, облученном ионами Ag с энергией 3 МэВ (справа). Эта цифра была изменена с разрешения Elsevier67. Пожалуйста, нажмите здесь, чтобы просмотреть увеличенную версию этой цифры.
Соображения по подготовке наностолбов для облучения неглубокими ионами были подробно описаны Hosemann et al.76. Одним из ключевых факторов, которые следует учитывать, является форма наностойки. В таком малом масштабе любое отклонение от идеальной геометрии может оказать значительное влияние на механические характеристики. Прямоугольный призматический наконечник намного лучше цилиндрического из-за сужения наконечника в кольцевой фрезерованной геометрии.
Эти репрезентативные результаты демонстрируют целый ряд систем материалов, методов получения и сложных сред, которые возможны при ионном облучении in situ TEM. В каждом конкретном случае тщательная подготовка образцов и планирование экспериментальных параметров имеют решающее значение для получения значимых данных. Более подробная информация об этих соображениях обсуждается ниже.
Обсуждение
Процедуры, описанные в настоящем документе, специфичны для установки I3TEM в Сандийских национальных лабораториях, однако общий подход может быть применен и к другим установкам для ионного облучения in situ TEM. Существует группа под названием «Семинар по ПЭМ с облучением in situ» (WOTWISI), которая проводит два раза в год встречи для обсуждения электронных микроскопов на ускорителях ионов. В Японии есть несколько объектов, в том числе Японский научно-исследовательский институт атомной энергии (JAERI)8 и Национальный институт материаловедения (NIMS)9. Еще одним объектом, способным облучать ионы in situ, является микроскоп и ускоритель ионов для исследования материалов (MIAMI) в Университете Хаддерсфилда77. Объект78 CSNSM-JANNUS Orsay оборудован устройством FEI Tecnai G2 20 TEM, работающим на напряжении 200 кВ и сопряженным с ионным имплантатором IRMA. Тандемная установка IVEM в Аргоннской национальной лаборатории является объектом10 пользователей ядерной науки. Эти установки по-разному интегрируют ионные ускорители, что приводит к уникальным углам пересечения ионного пучка и электронного пучка. Некоторые японские установки вводят ионный пучок под углом 30-45° от электронного пучка, ANL и MAIMI аналогично под углом 30° по Янусу под углом 68°, а I³TEM и Уханьский университет имеют ионные пучки перпендикулярно электронному пучку.
В зависимости от материала и исходной формы образца для подготовки образца к ПЭМ могут быть использованы различные методы. Образец должен быть достаточно тонким (менее 100 нм) для получения изображений в формате TEM. Несколько методов подготовки образцов можно найти в руководстве по методикам подготовки образцов ПЭМ37. Наибольшую легкость представляют наночастицы, которые можно легко забросить под каплю. Тонкие пленки, нанесенные на растворимую подложку, также достаточно просты в приготовлении (рис. 2). Объемный металлический материал может быть подготовлен путем тонкой полировки с последующей пробивкой струйной полировкой, где область вокруг отверстия достаточно тонкая для просмотра ПЭМ. Метод подъема сфокусированного ионного пучка (FIB) является хорошо известным методом подготовки различных материалов для ПЭМ и был подробно описан ранее 39,79,80. Одним из основных преимуществ метода является возможность выборочного исследования таких участков, как зернистые и фазовые границы. Еще одним преимуществом является разнообразие возможных геометрий образцов, включая: фольгу, нанонатяжение, наностойки и иглы атомных зондов для дополнительных напряжений в средах или корреляционных исследований. Недостатком образцов, подготовленных FIB для экспериментов по ионному облучению in situ, является то, что повреждения, вызванные процессом FIB, закручивают повреждения, накопленные во время эксперимента, что затрудняет определение количественных наблюдений. Биологические или полимерные образцы могут быть получены с помощью крио-FIB или криомикротомии, однако эти процессы здесь подробно не рассматриваются.
При планировании экспериментов по имплантации ионного пучка или облучению необходимо учитывать ряд важных параметров ионов. Глубина проникновения, поток/флюенс и радиационные повреждения являются переменными, которые часто контролируются при исследовании воздействия радиации. Эти параметры моделируются с использованием различных методов имитационного моделирования. Stopping Range of Ions in Materials (SRIM) — это моделирование методом Монте-Карло, написанное для расчета профилей осаждения ионов в материалах, подвергшихся воздействию энергетических пучков ионов21,81. Альтернативой SRIM является модель Робинсона82, которая использует множество функций для моделирования различной физики взаимодействия ионов высоких энергий в материалах. Другой альтернативой является модель, разработанная для одиночных эффектов в аэрокосмической промышленности, которая может быть адаптирована для использования в экспериментах с ионными пучками83. SRIM использует уравнение Кинчина-Пиза84 для моделирования смещения атомов под действием излучения. Программное обеспечение простое в использовании, а диапазон ионов, целевых элементов и энергий ионов может быть быстро рассчитан с помощью различных полезных выходов. Тем не менее, программное обеспечение ограничено в выборе используемых моделей, и, поскольку это программа Монте-Карло, требуется большое количество итераций, и пропорционально больше времени для выполнения моделирования. Модель Робинсона использует модифицированную версию уравнения Кинчина-Пиза84, которая имеет более высокое согласие с экспериментальными результатами, однако она более сложна в использовании. Благодаря широкому распространению и простоте использования, методы использования SRIM были применены здесь и в целом стали промышленным стандартом.
Одним из основных ограничений при рассмотрении многолучевого ПЭМ in situ является геометрия образца. Из-за того, что ПЭМ является проекционным методом визуализации и линейным ионным пучком, затенение электронного пучка или ионных пучков может повлиять на ход эксперимента. Тени от электронного пучка и ионного пучка могут образовываться из предметного столика, креплений и даже других частей образца. Чтобы избежать затенения образца предметным столиком, большинство столиков имеют ограничение по наклону от 25° до 40°. Кроме того, необходимо уделять больше внимания геометрии, при которой образец может затенять сам себя или затеняться сеткой ТЕА. По этой причине, устанавливая образец, позаботьтесь о том, чтобы была минимальная вероятность затенения. Для образцов крепления FIB на стоечных решетках это означает крепление к концу стойки в самой дальней и самой высокой точке.
Для экспериментов с одновременным облучением несколькими ионами существуют ограничения. Поскольку различные ионы образуются разными ускорителями или источниками, второй пучок должен быть изогнут магнитом на пути первого. Этот угол изгиба для описываемых приборов составляет около 20°. Для получения коллинеарных балок при изгибе должен быть высокий коэффициент жесткости балки. Жесткость луча (Bρ) определяется путем деления общего импульса на общий заряд, ее можно рассчитать по формуле:
 Уравнение (4)
Уравнение (4)
Где p — импульс, q — заряд, β — пропорциональность скорости изгиба частиц (β = ν/c), m0 — масса покоя иона, c — скорость света, γ — релятивистский фактор Лоренца:
 Уравнение (5)
Уравнение (5)
Это означает, что для многолучевых экспериментов лучше всего использовать тяжелые ионы высокой энергии и легкие ионы низкой энергии, такие как Au и He соответственно. Если несколько пучков генерируются одним и тем же ускорителем, они должны иметь одинаковое отношение массы к энергии, например, 4He+ и 2D2+. Условия визуализации также могут влиять на ионные пучки. Магнитное поле объектива в режимах визуализации с большим увеличением может быть достаточно сильным, чтобы искривить траекторию ионов. Помните о типе анализа, который требуется при юстировке ионных пучков.
Контраст в ПЭМ может возникать из-за разницы в толщине, фазе, порядке кристаллов и химическом составе. В зависимости от исследуемого признака следует учитывать несколько различных типов контраста и условий визуализации. Полезно понимать механизмы, лежащие в основе дифракционного контраста и фазового контраста. Также будет полезно понять, как манипулировать электронным микроскопом для получения двухлучевой динамической, ярко-польной кинематической и слаболучевой визуализации в темном поле. Они подробно описаны в Jenkins and Kirk, 2000:50.
Для анализа дислокаций необходимо индексировать множественные дифракционные картины под разными углами, чтобы определить вектор решетки обратной пространственной решетки (g). Затем можно использовать два условия визуализации пучка для определения вектора Бюргерса дислокаций (b). В темном поле слабого луча дислокации могут быть изображены с более высоким разрешением и контрастностью. Этот метод применяется при высокой плотности дислокаций или большом количестве частичных. Чтобы рассчитать плотность объемных дислокаций, толщина фольги должна быть измерена точно в интересующей области. Это можно сделать с помощью таких методов, как спектроскопия потерь энергии электронов или дифракция электронов на основе сходящегося пучка. Для границ зерен с малым углом дислокации на границе могут быть выделены как сеть в двух динамических условиях луча. Для границ зерен с большим углом одно зерно визуализируется в двух динамических условиях луча, а другое — в кинематических. Двойные границы можно охарактеризовать аналогичным образом. Условия визуализации по Френелю используются для визуализации заполненных газом пузырьков и пустот. Небольшие полости более заметны, когда изображение немного не в фокусе и в условиях кинематической дифракции. Условия недостаточной фокусировки используются для определения реального диаметра. Пузыри также могут индуцировать поля деформации, значения которых могут быть оценены в случае небольших пузырьков. Автоматизированное картирование ориентации кристаллов (ACOM) используется для картирования нескольких зерен и их ориентации, аналогичной дифракции обратного рассеяния электронов (EBSD) в сканирующем электронном микроскопе (SEM). Лучше всего, если кристаллы имеют толщину, чтобы избежать интерференции от перекрывающихся дифракционных картин.
Можно проводить эксперименты и с другими внешними стрессорами, такими как температурные и механические напряжения. Подготовка образцов и экспериментальные соображения во многом такие же, как и для многолучевых экспериментов. Необходимо позаботиться о том, чтобы метод нагрева и диапазон температур соответствовали материалу. Геометрия также должна быть учтена, чтобы избежать эффектов затенения. Специальные держатели для нагрева или механических испытаний будут иметь определенные геометрические ограничения, и к их спецификациям необходимо обращаться14. Также возможны комбинации этих стрессоров. Механические испытания in situ требуют дополнительной подготовки образца до соответствующей геометрии. Существуют специализированные этапы для экспериментов по проверке механических характеристик в различных условиях нагружения, таких как: растяжение, сжатие, изгиб, усталость и ползучесть. Нагрев in situ может выполняться как во время облучения, так и после облучения для исследований отжига. Для регулирования температуры до 1000 °C можно использовать каскады на основе MEMS или кондуктивного нагрева. Более высокие температуры могут быть достигнуты с помощью лазера in situ для нагрева образцов до нескольких тысяч градусов Цельсия33. Образцы могут подвергаться воздействию различных сред с помощью держателей in situ. Сюда входят различные газы, жидкости и даже агрессивные среды.
Таким образом, многолучевые эксперименты in situ с помощью ПЭМ позволяют имитировать экстремальные условия и наблюдать за микроструктурой и эволюцией материалов в режиме реального времени на наноуровне. Понимание фундаментальных механизмов, управляющих динамическими процессами, полученное в результате этих экспериментов, может помочь в создании прогностических моделей, которые проложат путь к проектированию материалов следующего поколения. Важно подготовить образцы в соответствии с описанием, чтобы обеспечить наилучшие шансы на успешное проведение эксперимента.
Раскрытие информации
Авторам нечего раскрывать.
Благодарности
Авторы выражают признательность Дэниелу Баффорду, Сэмюэлю Бриггсу, Клэр Чисолм, Энтони Монтерросе, Бриттани Мунтиферинг, Патрику Прайсу, Дэниелу Буллеру, Барни Дойлу, Дженнифер Шулер и Маккензи Стекбек за их технический и научный вклад. Кристофер М. Барр и Халид Хаттар получили полную поддержку от Управления науки Министерства энергетики США. Эта работа была выполнена, в частности, в Центре интегрированных нанотехнологий, Управлении научных пользователей, управляемом Управлением по науке Министерства энергетики США (DOE). Sandia National Laboratories — это многоцелевая лаборатория, управляемая и управляемая компанией National Technology & Engineering Solutions of Sandia, LLC, дочерней компанией Honeywell International, Inc., для Национального управления по ядерной безопасности Министерства энергетики США по контракту DE-NA-0003525. Мнения, выраженные в статье, не обязательно отражают точку зрения Министерства энергетики США или правительства Соединенных Штатов.
Материалы
| Name | Company | Catalog Number | Comments |
| Colutron Accelerator | Colutron Research Corporation | G-1 | 10 kV ion accelerator |
| Cu Omniprobe Lift-Out Grid with 4 posts | Ted Pella | DM71302 | Cu Omniprobe Lift-Out Grid with 4 posts |
| Double Tilt Cryo TEM Stage | Gatan | DT636 | Cryogenically cooled double tilt TEM holder |
| Double Tilt Heating TEM Stage | Gatan | DT652 | Resistive heater equipped double tilt TEM holder |
| I3TEM | JEOL | JEM-2100 | Modified transmission electron microscope for in-situ ion irradiation |
| Isopropanol | Fisher Scientific | A459-4 | 70 % v/v isopropanol |
| Mo Omniprobe Lift-Out Grid with 4 posts | Ted Pella | DM810113 | Mo Omniprobe Lift-Out Grid with 4 posts |
| Petri Dish | Fisher Scientific | Corning 316060 | 60 mm diamter 15 mm height petri dish |
| Picoindenter TEM Stage | Bruker Hysitron | PI95 | Picoindenter TEM Stage |
| Scios 2 | Thermofisher Scientfic | SCIOS2 | Dual beam focused ion beam scaning electron microscope |
| Tandem Accelerator | High Voltage Engineering Corporation | 6 MV Van de Graaff-Pelletron ion accelerator | |
| Tomography TEM holder | Hummingbird | TEM holder for tomography measurements | |
| Tweezers | PELCO | 5373-NM | Reverse action self closing fine tip tweezer |
Ссылки
- Butler, E. In situ experiments in the transmission electron microscope. Reports on Progress in Physics. 42, 833(1979).
- Odette, G. R., Wirth, B. D., Bacon, D. J., Ghoniem, N. M. Multiscale-Multiphysics Modeling of Radiation-Damaged Materials: Embrittlement of Pressure-Vessel Steels. MRS Bulletin. 26, 176-181 (2001).
- Wirth, B. D. How does radiation damage materials. Science. 318, 923-924 (2007).
- Butler, E. P., Hale, K. F. Dynamic experiments in the electron microscope. , North-Holland Pub. Co. (1981).
- Jungjohann, K., Carter, C. B. Transmission Electron Microscopy. Carter, C. B., Williams, D. B. , Springer International Publishing. Ch. 2 (2016).
- Pashley, D., Presland, A. Ion damage to metal films inside an electron microscope. Philosophical Magazine. 6, 1003-1012 (1961).
- Whitmell, D., Kennedy, W., Mazey, D., Nelson, R. A heavy-ion accelerator-electron microscope link for the direct observation of ion irradiation effects. Radiation Effects and Defects in Solids. 22, 163-168 (1974).
- Hojou, K., et al. In situ EELS and TEM observation of silicon carbide irradiated with helium ions at low temperature and successively annealed. Nuclear Instruments and Methods in Physics Research Section B: Beam Interactions with Materials and Atoms. 116, 382-388 (1996).
- Furuya, K., Song, M., Saito, T. In-situ, analytical, high-voltage and high-resolution transmission electron microscopy of Xe ion implantation into Al. Microscopy. 48, 511-518 (1999).
- Allen, C. W., Ryan, E. A. In situ ion beam research in Argonne's intermediate voltage electron microscope. MRS Online Proceedings Library Archive. 439, (1996).
- Greaves, G., et al. New Microscope and Ion Accelerators for Materials Investigations (MIAMI-2) system at the University of Huddersfield. Nuclear Instruments and Methods in Physics Research Section A: Accelerators, Spectrometers, Detectors and Associated Equipment. 931, 37-43 (2019).
- Gentils, A., Cabet, C. Investigating radiation damage in nuclear energy materials using JANNuS multiple ion beams. Nuclear Instruments and Methods in Physics Research Section B: Beam Interactions with Materials and Atoms. 447, 107-112 (2019).
- Guo, L., et al. Establishment of in situ TEM-implanter/accelerator interface facility at Wuhan University. Nuclear Instruments and Methods in Physics Research Section A: Accelerators, Spectrometers, Detectors and Associated Equipment. 586, 143-147 (2008).
- Hattar, K., Bufford, D. C., Buller, D. L. Concurrent in situ ion irradiation transmission electron microscope. Nuclear Instruments and Methods in Physics Research Section B: Beam Interactions with Materials and Atoms. 338, 56-65 (2014).
- Hinks, J. A review of transmission electron microscopes with in situ ion irradiation. Nuclear Instruments and Methods in Physics Research Section B: Beam Interactions with Materials and Atoms. 267, 3652-3662 (2009).
- Was, G., et al. Emulation of reactor irradiation damage using ion beams. Scripta Materialia. 88, 33-36 (2014).
- Taylor, C. A., et al. In situ TEM Multi-Beam Ion Irradiation as a Technique for Elucidating Synergistic Radiation Effects. Materials. 10, 1148(2017).
- Ziegler, J. F., Ziegler, M. D., Biersack, J. P. SRIM-The stopping and range of ions in matter. Nuclear Instruments and Methods in Physics Research Section B: Beam Interactions with Materials and Atoms. 268, 1818-1823 (2010).
- Li, M., Kirk, M., Baldo, P., Xu, D., Wirth, B. Study of defect evolution by TEM with in situ ion irradiation and coordinated modeling. Philosophical Magazine. 92, 2048-2078 (2012).
- Ulmer, C. J., Motta, A. T. Characterization of faulted dislocation loops and cavities in ion irradiated alloy 800H. Journal of Nuclear Materials. 498, 458-467 (2018).
- Stoller, R. E., et al. On the use of SRIM for computing radiation damage exposure. Nuclear Instruments and Methods in Physics Research B. 310, 75-80 (2013).
- Weber, W. J., Zhang, Y. Predicting damage production in monoatomic and multi-elemental targets using stopping and range of ions in matter code: Challenges and recommendations. Current Opinion in Solid State and Materials Science. 23, 100757(2019).
- Wesch, W., Wendler, E. Ion Beam Modification of Solids. 61, Springer. (2016).
- Was, G. S. Fundamentals of radiation materials science: metals and alloys. , Springer. (2016).
- Crowder, B. Ion implantation in semiconductors and other materials. , Springer Science & Business Media. (2013).
- Merkle, K., Averback, R. S., Benedek, R. Energy Dependence of Defect Production in Displacement Cascades in Silver. Physical Review Letters. 38, 424(1977).
- Averback, R. S., Benedek, R., Merkle, K. Correlations between ion and neutron irradiations: Defect production and stage I recovery. Journal of Nuclear Materials. 75, 162-166 (1978).
- Middleton, R. A negative ion cookbook. , University of Pennsylvania. unpublished (1989).
- ASTM International. ASTM E521, Standard Practice for Netron Radiation Damage Simulation by Charged-Particle Irradiation. 12.02, ASTM International. (2009).
- Smith, R. Atomic and ion collisions in solids and at surfaces: theory, simulation and applications. , Cambridge University Press. (2005).
- Averback, R. S., Diaz De La Rubia, T. Displacement damage in irradiated metals and semiconductors. Solid state physics. 51, New York. 281(1997).
- Taylor, C. A., et al. Investigating Helium Bubble Nucleation and Growth through Simultaneous In-Situ Cryogenic, Ion Implantation, and Environmental Transmission Electron Microscopy. Materials. 12, 2618(2019).
- Grosso, R., et al. In situ Transmission Electron Microscopy for Ultrahigh Temperature Mechanical Testing of ZrO2. Nano Letters. , (2020).
- Barr, C. M., et al. Application of In-situ TEM Nanoscale Quantitative Mechanical Testing to Elastomers. Microscopy and Microanalysis. 25, 1524-1525 (2019).
- Wang, B., Haque, M. A., Tomar, V., Hattar, K. Self-ion irradiation effects on mechanical properties of nanocrystalline zirconium films. MRS Communications. 7, 595-600 (2017).
- Sun, C., et al. Microstructure, chemistry and mechanical properties of Ni-based superalloy Rene N4 under irradiation at room temperature. Acta Materialia. 95, 357-365 (2015).
- Ayache, J., Beaunier, L., Boumendil, J., Ehret, G., Laub, D. Sample preparation handbook for transmission electron microscopy: techniques. 2, Springer Science & Business Media. (2010).
- Aitkaliyeva, A., Madden, J. W., Miller, B. D., Cole, J. I., Gan, J. Comparison of preparation techniques for nuclear materials for transmission electron microscopy (TEM). Journal of Nuclear Materials. 459, 241-246 (2015).
- Heaney, P. J., Vicenzi, E. P., Giannuzzi, L. A., Livi, K. J. Focused ion beam milling: A method of site-specific sample extraction for microanalysis of Earth and planetary materials. American Mineralogist. 86, 1094-1099 (2001).
- Li, C., Habler, G., Baldwin, L. C., Abart, R. An improved FIB sample preparation technique for site-specific plan-view specimens: A new cutting geometry. Ultramicroscopy. 184, 310-317 (2018).
- Huang, Y., Lozano-Perez, S., Langford, R., Titchmarsh, J., Jenkins, M. Preparation of transmission electron microscopy cross-section specimens of crack tips using focused ion beam milling. Journal of microscopy. 207, 129-136 (2002).
- Kuzmin, O. V., Pei, Y. T., De Hosson, J. T. Nanopillar fabrication with focused ion beam cutting. Microscopy and Microanalysis. 20, 1581-1584 (2014).
- Miller, M. K., Russell, K. F. Atom probe specimen preparation with a dual beam SEM/FIB miller. Ultramicroscopy. 107, 761-766 (2007).
- Horváth, B., Schäublin, R., Dai, Y. Flash electropolishing of TEM lamellas of irradiated tungsten. Nuclear Instruments and Methods in Physics Research Section B: Beam Interactions with Materials and Atoms. 449, 29-34 (2019).
- Yang, T. N. The Effect of Principal Elements on Defect Evolution in Single-Phase Solid Solution Ni Alloys. , (2018).
- Huang, Z. Combining Ar ion milling with FIB lift-out techniques to prepare high quality site-specific TEM samples. Journal of Microscopy. 215, 219-223 (2004).
- Abràmoff, M. D., Magalhães, P. J., Ram, S. J. Image processing with ImageJ. Biophotonics international. 11, 36-42 (2004).
- English, C., Jenkins, M., Kirk, M. Characterisation of displacement cascade in Cu3Au produced by fusion-neutron Irradiation. Journal of Nuclear Materials. 104, 1337-1341 (1981).
- Wåhlin, L. The colutron, a zero deflection isotope separator. Nuclear Instruments and Methods. 27, 55-60 (1964).
- Jenkins, M. L., Kirk, M. A. Characterisation of Radiation Damage by Transmission Electron Microscopy. 1st edn. , CRC Press. (2000).
- Williams, D. B., Carter, C. B. Transmission electron microscopy. , Springer. 3-17 (1996).
- Rauch, E., et al. Automatic crystal orientation and phase mapping in TEM by precession diffraction. Microscopy and Analysis-UK. 128, 5-8 (2008).
- Reed, B., et al. Initiation of Grain Growth Observed Using Electrostatic-Subframing. Microscopy and Microanalysis. 25, 1518-1519 (2019).
- Hoppe, S. M., et al. Penetrating Radiation Systems and Applications XIII. , International Society for Optics and Photonics. 85090 (2012).
- Midgley, P. A., Dunin-Borkowski, R. E. Electron tomography and holography in materials science. Nature Materials. 8, 271(2009).
- Aguiar, J. A., et al. In-situ Ion Irradiation and Recrystallization in Highly Structured Materials. Microscopy and Microanalysis. 25, 1572-1573 (2019).
- Briot, N. J., Kosmidou, M., Dingreville, R., Hattar, K., Balk, T. J. In situ TEM investigation of self-ion irradiation of nanoporous gold. Journal of materials science. 54, 7271-7287 (2019).
- Bufford, D., Abdeljawad, F., Foiles, S., Hattar, K. Unraveling irradiation induced grain growth with in situ transmission electron microscopy and coordinated modeling. Applied Physics Letters. 107, 191901(2015).
- Bufford, D., Dingreville, R., Hattar, K. In situ Observation of Single Ion Damage in Electronic Materials. Microscopy and Microanalysis. 21, 1013-1014 (2015).
- Bufford, D. C., Hattar, K. Physical response of gold nanoparticles to single self-ion bombardment. Journal of Materials Research. 29, 2387-2397 (2014).
- Bufford, D. C., Snow, C. S., Hattar, K. Cavity Formation in Molybdenum Studied In situ in TEM. Fusion Science and Technology. 71, 268-274 (2017).
- Chen, Y., et al. In situ study of heavy ion irradiation response of immiscible Cu/Fe multilayers. Journal of Nuclear Materials. 475, 274-279 (2016).
- Cowen, B. J., El-Genk, M. S., Hattar, K., Briggs, S. A. A study of irradiation effects in TiO2 using molecular dynamics simulation and complementary in situ transmission electron microscopy. Journal of Applied Physics. 124, 095901(2018).
- Dillon, S. J., et al. Irradiation-induced creep in metallic nanolaminates characterized by In situ TEM pillar nanocompression. Journal of Nuclear Materials. 490, 59-65 (2017).
- El-Atwani, O., et al. In-situ TEM/heavy ion irradiation on ultrafine-and nanocrystalline-grained tungsten: Effect of 3 MeV Si, Cu and W ions. Materials Characterization. 99, 68-76 (2015).
- Jawaharram, G. S., Barr, C., Price, P., Hattar, K., Dillon, S. J. In situ TEM Measurements of Ion Irradiation Induced Creep. Microscopy and Microanalysis. 25, 1566-1567 (2019).
- Jawaharram, G. S., et al. High temperature irradiation induced creep in Ag nanopillars measured via in situ transmission electron microscopy. Scripta Materialia. 148, 1-4 (2018).
- Li, N., Hattar, K., Misra, A. In situ Probing of the Evolution of Irradiation-induced Defects in Copper. Microscopy and Microanalysis. 21, 443-444 (2015).
- Muntifering, B., Dunn, A., Dingreville, R., Qu, J., Hattar, K. In-Situ TEM He+ Implantation and Thermal Aging of Nanocrystalline Fe. Microscopy and Microanalysis. 21, 113-114 (2015).
- Muntifering, B., et al. In situ transmission electron microscopy He+ implantation and thermal aging of nanocrystalline iron. Journal of Nuclear Materials. 482, 139-146 (2016).
- Muntifering, B., Juan, P. A., Dingreville, R., Qu, J., Hattar, K. In-Situ TEM Self-Ion Irradiation and Thermal Aging of Optimized Zirlo. Microscopy and Microanalysis. 22, 1472-1473 (2016).
- Taylor, C., Muntifering, B., Snow, C., Hattar, K., Senor, D. Using in-situ TEM Triple Ion Beam Irradiations to Study the Effects of Deuterium, Helium, and Radiation Damage on TPBAR Components. Microscopy and Microanalysis. 23, 2216-2217 (2017).
- Taylor, C. A., et al. Investigation of Helium Behavior in Multilayered Hydride Structures Through In-situ TEM Ion Implantation. Microscopy and Microanalysis. 25, 1570-1571 (2019).
- Wang, X., et al. Defect evolution in Ni and NiCoCr by in situ 2.8 MeV Au irradiation. Journal of Nuclear Materials. , (2019).
- Bufford, D. C., Barr, C. M., Wang, B., Hattar, K., Haque, A. Application of In situ TEM to Investigate Irradiation Creep in Nanocrystalline Zirconium. JOM. , (2019).
- Hosemann, P., Kiener, D., Wang, Y., Maloy, S. A. Issues to consider using nano indentation on shallow ion beam irradiated materials. Journal of Nuclear Materials. 425, 136-139 (2012).
- Hinks, J., Van Den Berg, J., Donnelly, S. MIAMI: Microscope and ion accelerator for materials investigations. Journal of Vacuum Science & Technology A: Vacuum, Surfaces, and Films. 29, 021003(2011).
- Serruys, Y., et al. Multiple ion beam irradiation and implantation: JANNUS project. Nuclear Instruments and Methods in Physics Research Section B: Beam Interactions with Materials and Atoms. 240, 124-127 (2005).
- Giannuzzi, L. A., Stevie, F. A. A review of focused ion beam milling techniques for TEM specimen preparation. Micron. 30, 197-204 (1999).
- Langford, R., Petford-Long, A. Preparation of transmission electron microscopy cross-section specimens using focused ion beam milling. Journal of Vacuum Science & Technology A: Vacuum, Surfaces, and Films. 19, 2186-2193 (2001).
- Ziegler, J. F., Biersack, J. P. Nuclear Energy Agency of the OECD (NEA). , (2008).
- Robinson, M. T., Torrens, I. M. Computer simulation of atomic-displacement cascades in solids in the binary-collision approximation. Physical Review B. 9, 5008(1974).
- Hands, A., et al. New data and modelling for single event effects in the stratospheric radiation environment. IEEE Transactions on Nuclear Science. 64, 587-595 (2016).
- Kinchin, G., Pease, R. The displacement of atoms in solids by radiation. Reports on progress in physics. 18, 1(1955).
Перепечатки и разрешения
Запросить разрешение на использование текста или рисунков этого JoVE статьи
Запросить разрешениеThis article has been published
Video Coming Soon
Авторские права © 2025 MyJoVE Corporation. Все права защищены