Method Article
再入可能および二重再入可能なキャビティまたは柱を含むガスを覆うマイクロテクスチャを彫ることによってSiO2/Si表面をレンダリングする
要約
この研究は、フォトリソグラフィとドライエッチングを使用してSiO2/Siウエハース上の再入可能および二重の再入可能プロファイルを備えた空洞および柱を達成するための微細加工プロトコルを提示する。得られたマイクロテクスチャー表面は、シリカの本質的な濡れ性にもかかわらず、湿潤液体の下の空気の堅牢な長期的な捕捉を特徴とする顕著な液体の反発を示す。
要約
私たちは、リエントラントと二重の再入可能な特徴を持つ空洞と柱で構成されるガス包みマイクロテクスチャ(GEM)を作成することにより、液体(オムニフォビック)に対する本質的に湿潤材料をレンダリングするためのマイクロファブリケーションプロトコルを提示します。具体的には、モデルシステムとしてSiO2/Siを使用し、2次元(2D)設計、フォトリソグラフィ、等方性/異方性エッチング技術、熱酸化物成長、ピラニア洗浄、およびそれらの微細な質感の達成に向けた保存のためのプロトコルを共有しています。従来の知恵は、本質的に濡れた表面(θo <90°)を粗くすると、より濡れる(θ r<θ o<90°)ことを示していますが、GEMは基板の本質的な濡れ性にもかかわらず液体の反発を示します。例えば、水/空気系に対してシリカθo ≈ 40°、六重デカン/空気系の場合はθo ≈ 20°の固有の濡れ性にもかかわらず、空洞を含むGEMはそれらの液体に浸漬時に空気を強固に捕捉し、液滴の明らかな接触角はθr > 90°です。GEMsの再入可能および二重リエントラント機能は、侵入した液体メニスカスを安定化させ、それによって液体固体蒸気システムを安定的な空気充填状態(Cassie州)に捕捉し、例えば数時間から数ヶ月の間に熱力学的に安定した完全充填状態(Wenzel状態)への湿潤移行を遅らせる。同様に、再入可能な二重再入可能なマイクロピラーのアレイを持つSiO2/Si表面は、極めて高い接触角(θr ≈ 150°~160°)と低接触角ヒステリシスをプローブ液体に示し、超非性交感性として特徴付けられる。しかし、同じ液体に浸漬すると、それらの表面は劇的に超不眠恐怖症を失い、<1 s内で完全に満たされます。この課題に対処するために、二重リエントラントプロファイルを持つ壁に囲まれた二重リエントラント柱の配列を構成するハイブリッド設計のプロトコルを提示します。実際、ハイブリッドマイクロテクスチャは、プローブ液体に浸漬する上で空気を閉じ込める。要約すると、ここで説明するプロトコルは、パーフルオロカーボンなどの化学コーティングのないオムニフォビシティを達成するという文脈で、OMNIphobic材料としてのアプリケーションのための安価な共通材料の範囲を解き放つ可能性があるBOMの調査を可能にする必要があります。シリカのマイクロテクスチャは、柔らかい材料のテンプレートとしても機能する可能性があります。
概要
明らかな接触角を示す固体表面は、水および六色デカンのような極性および非極性液体に対してθ r>90°、オムニフォビック1と呼ばれる。これらの表面は、水淡水化2、3、油水分離4、5、抗バイオ汚れ6、および還元流体力学的抗力の引き薬7を含む、数多くの実用的なアプリケーションを果たす。典型的には、全発音性は、パーフルオロイン化学物質およびランダムトポグラフィー8、9、10、11、12を必要とする。しかし、これらの材料/コーティングのコスト、非生分解性、および脆弱性は、例えば、飼料側温度が上がるにつれて過フッ化化淡水化膜が分解し、毛穴濡れ13、14、および過フッ素化/炭化炭素コーティングも15、16および分解された流量の流れによって劣化する無数の制約をもたらす。従って、パーフッ素化コーティングの機能を達成するための代替戦略(すなわち、撥水コーティングを使用せずに液体に浸漬する空気を包み込む)が必要である。したがって、研究者は、マイクロテックス単独で浸漬に空気を閉じ込めることができる張り出した(再入可能な)特徴で構成される表面地形を提案しています17,18,19, 20,21,22,23,25.これらのマイクロテクスチャには、キャビティ26、ピラー27、繊維状マット8の3種類があります。次に、単純な突出しを持つ再入可能な機能を再入可能(図1A–Bおよび図1E-F)、および二重リエントラント(図1C-Dおよび図1G-H)としてベースに向かって90°回転するオーバーハングを持つ再入可能な機能を指します。
Wernerらの先駆的な研究では、ヴェルナーら22、28、29、30、31はスプリングテール(Collembola)のキューティクルを特徴付け、土壌に住む節足動物であり、湿潤の文脈におけるキノコ型(再入可能)特徴の重要性を説明した。他の人はまた、極端な水の撃退を促進するために海のスケーター32、33におけるキノコ型の髪の役割を調査しました。Wernerと同僚は、逆インプリントリソグラフィ29を介してバイオミメティック構造を彫刻することによって、本質的に湿潤ポリマー表面のオムニフォビシティを実証した。劉とキムは、表面張幅が低い液体の滴をγLV = 10 mN/mと引き立てることができる二重再入可能な柱の配列で飾られたシリカ表面について報告した。これらの驚くべき発展に触発され、我々は彼らの結果を再現するために劉とキムのレシピに従った。しかし、これらのマイクロテクスチャは、湿潤液がマイクロテクスチャの端に触れた場合、または局所的な物理的損傷がある場合、超不眠恐怖症、すなわちθr →0°を壊滅的に失うことを発見した。これらの知見は、ピラーベースのマイクロテクスチャが浸漬に対するオムニフォビシティを必要とするアプリケーションに適さないことを示し、オムニフォビシティを評価するための基準(接触角度だけに限定するか、追加の基準が必要な場合)にも疑問を呈した。
これに対し、SiO2/Siウエハースを使用して、二重に再入可能な入り口を持つマイクロスケールの空洞のアレイを調製し、代表的な極性および非極性液体として水と六重デカンを使用して、これらの微小質テクスチャが空気を包み込んで液体が入るのを防ぎ、(ii)空洞の区画化されたアーキテクチャが閉じ込められた空気の欠陥によって閉じ込められた構造を失うことを防ぐことを実証しました。そのため、これらのマイクロテクスチャは「ガスを包み込むマイクロテクスチャ」(GEM)と呼ばれています。次のステップとして、我々は、さまざまな形状(円形、正方形、六角形)およびプロファイル(単純、再入可能、および二重リエントラント)を有するGEMsをマイクロファブリケーションし、湿潤液体への浸漬下での性能を体系的に比較する26。また、二重に再入可能なプロファイルを持つ壁に囲まれた二重に再入可能な柱の配列で構成されるハイブリッドマイクロテクスチャを作成し、液体が柱の茎に触れるのを防ぎ、浸漬35に堅牢に空気を閉じ込めました。以下に、フォトリソグラフィおよびエッチング技術を用いてSiO2/Si表面上のGEMを製造するための詳細なプロトコルを設計パラメータとともに提示します。また、接触角ゴニオメトリー(前進/後退/位置指定された角度)と六価分水への浸漬によって、その濡れを特徴付ける代表的な結果を提示する。
プロトコル
注: リエントラントおよび二重に再入可能なキャビティと柱の配列は、劉とキム27によって報告された柱のためのマルチステッププロトコルを適応させることによって微細加工されました。湿潤移行を妨げる可能性のある表面上のピン残基または粒子の形成を最小限に抑えるための予防措置が講じられました36.
キャビティの微細加工
広い意味では、リエントラントおよび二重再入可能キャビティ(DCおよびDRC)の微細加工のためのプロトコルは、2次元レイアウト設計、フォトリソグラフィ、一般的なシリカエッチング、および特定のシリコーンエッチングから構成され、最終的な機能に応じて37、38、39、40、41が必要である。
1. デザイン
- レイアウトソフトウェア42で必要なパターンを設計して微細加工を開始する。このようなソフトウェアの例は、マテリアルリストにリストされています。
- ソフトウェアを使用して、新しいファイルを作成します。直径の円であるD = 200 μmの単位セルを描き、この円をL = 212 μmの中心から中心までの距離(ピッチ)でコピーして貼り付け、面積1cm2の正方形パッチで円の配列を作成します(図2)。
- 直径 100 mm (4 インチ) の円を描画します。1 cm2の正方形の配列を円の内側に配置し、それを複製して 4 x 4 グリッドの正方形の配列を作成します。円の内側のフィーチャは 4 インチのウェハーに転送されます (図 2)。
- マスク書記システムの目的の形式(GDSIIフォーマットなど)にデザインファイルをエクスポートします。
2. ウェーハのクリーニング
- シリコンウエハの直径4インチ、<100>向き、厚さ2.4μmの熱酸化層(材料リストを参照)を10分間ピラニア溶液で洗浄し、ピラニア溶液は硫酸(H2 SO4、96%):過酸化水素(H2O2、30%)を含む3:1容積比で、T = 388 Kに維持されます。
- 脱イオン水でウエハをすすい、窒素(N2)環境下でスピンドライします。
3. フォトリソグラフィ
- フォトレジストとの密着性を向上させるために、気相堆積物を使用してヘキサメチルジシナザン(HMDS)でウェーハをコーティングします。プロセスの詳細については、表 1を参照してください。
- ウエハーをスピンコーターの4インチ真空チャックに取り付けます。AZ-5214Eフォトレジストでウエハーを覆います。スピンコーターを使用して、フォトレジストを1.6μmの厚さの層として均一に表面に広げます。スピンコーティングパラメータについては表2を参照してください。
- フォトレジストでコーティングされたウエハーを110°Cに保ったホットプレートで120s焼きます。
- ウェーハを直接書き込みシステムに移し、ウェーハを55ミリ秒のUV放射線にさらす(焦点を下す:+5)。このステップでは、AZ-5214E (正のトーンで使用される)で目的の設計を転送します。
- 開発する機能のために60 sのためのAZ-726開発者を含むガラスのペトリ皿にUV露出ウエハーを置きます。詳細については、マテリアルリストを参照してください。
- 現像液からウエハを取り出し、脱イオン(DI)水で優しくすすぎ、余分な現像液を除去します。N2環境でウエハをスピンドライする。これらの手順は、図 3A–Cに示されています。
注:このステップの最後に、ウエハーの設計パターンは標準的な光学顕微鏡で見ることができます。
4. シリカの異方性エッチング(SiO2)層
注: このステップの目的は、フォトリソグラフィ中に露出したシリカ層(厚さ 2.4 μm)を完全にエッチングして、下のシリコン層を露出することです。
- フォトリソグラフィ後、ウエハを誘導結合プラズマ(ICP)反応性イオンエッチング(RIE)系に移し、オクタフルオロシクロブタン(C4F8)と酸素(O2)ガスを垂直に下方にエッチングする(異方性エッチング)を用いた。
- ICP-RIEプロセスを約13分間実行し、露出したシリカ層をエッチングします。表 3 の ICP-RIE パラメータを参照してください。このステップでは、フォトレジスト層も完全にエッチングされます(図3C-D)。
- 希望するパターン内部のシリカ層の厚さがゼロに縮小されるように、シリコン層が露出するように、反射計を用いて残存シリカの厚さを測定する。シリカ層の厚さに基づいて、その後のエッチング期間の持続時間を調整します(特にパターンとその周辺)。
注:反射計は、残りのシリカ層43の厚さを測定するために使用されました。あるいは、SiO2と厚さの色を予測する省略計やインタラクティブカラーチャートなどの他のツールも44、45を使用することができます。
ステップ 1 および 4 で説明する手順は、再入可能キャビティと二重再入キャビティの両方で共通です。ただし、シリコン層のエッチングプロトコルは異なっており、以下に説明します。
5. 再入キャビティ
-
異方性シリコンエッチング
- シリカ層をエッチングした後、ウェハを深いICP-RIE系にエッチングシリコンに移します。最初のステップは、シリコンを垂直に下向きにエッチングするボッシュプロセスとして知られるフッ素系異方性エッチング法で構成され、真っ直ぐな壁を作り出します。
注:ボッシュプロセスは、反応チャンバーにC4F8および硫黄六フッ化物(SF6)ガスを使用します:C4F8堆積はパッシベーション層を作成し、SF6はシリコンを垂直にエッチングします。このように、ボッシュプロセスは、高アスペクト比でシリコン中の深いトレンチの微細加工を可能にします。 - このプロセスを 5 サイクル実行し、これは、 ≈ 2 μm に相当するシリコンのエッチング深さに対応します。
- ボッシュプロセスの残骸を取り除くために10分間ピラニア溶液でウエハーを洗浄します。N2環境でのDI水とスピンドライでウェーハをリンスします(図3E)。
- シリカ層をエッチングした後、ウェハを深いICP-RIE系にエッチングシリコンに移します。最初のステップは、シリコンを垂直に下向きにエッチングするボッシュプロセスとして知られるフッ素系異方性エッチング法で構成され、真っ直ぐな壁を作り出します。
- 等方性シリコンエッチング:再入可能な特徴を作成するために、シリカ層の下にアンダーカットを作成する等方性エッチングを行う。5 μm のオーバーハングは、シリコン層を SF6で 2 分 45 秒 (図 3F)でエッチングすることで実現できます。プロセスパラメータについては、表5を参照してください。
-
異方性シリコンエッチング:再入可能なフィーチャーが作成されたら、ボッシュプロセスによってキャビティの深さを調整します(ステップ 5.1)。
注: 深さhc ≈ 50 μm のキャビティを微細加工するには、ボッシュプロセスの 160 サイクルが必要です (図 3G、表 4)。 -
ウェーハ洗浄と保管
- ステップ2で説明したようにピラニア溶液を使用してウエハを洗浄する。このステップの後、ウエハは水の接触角θ o ≈ 0°によって特徴づけられる超親水性になります。
- ウエハーをガラスのペトリ皿に保管し、T = 323 K、真空圧PVac = 3.3 kPa (48 時間) に保たれたクリーン真空オーブンの中に保管し、その後シリカ層の固有の接触角がθo ≈ 40°に安定します。
- サンプルは、外向きの窒素(99%)を備えた清潔なキャビネットに保管してください。フロー、さらなる特徴付けの準備が整いました。
6. 二重の再入キャビティ
- 異方性シリコンエッチング:二重に再入可能なキャビティを作成するには、手順 1、2、3、4、および 5.1 に従います (図 4A–Eを参照)。
-
等方性シリコンエッチング
二重に再入可能な機能を作成するには、最初に再入可能な機能を作成する必要があります。これを達成するために、等方性エッチングを行い、シリカ層の下にアンダーカットを作成します。シリコン層をSF6で25s用にエッチングします(図4F)。プロセスパラメータについては、表5を参照してください。続いて、ステップ2で説明したようにピラニア溶液を用いてウエハを洗浄する。 -
熱酸化物の成長
- 二重に再入可能な特徴を達成するために、高温炉システムを使用して、ウェハ上の熱酸化物の500nm層を成長させます(図4G)。
- 反射計を用いて酸化物層の厚さを測定します。
注:酸素(O2)と水蒸気を含む環境に試料を曝露して酸化を行い、800~1,200°Cの温度でシリコンを密閉した環境での湿潤酸化を引き起こしました。
- シリカエッチング:ステップ4で説明したのと同じ処理を行い、3分間下方にシリカを下にエッチングする。異方性エッチングの結果、熱酸化物(厚さ500nmのシリカ層)は空洞から離れてエッチングされるが、最終的には二重に再入可能なエッジを形成する側壁に沿って「オーバーハング」を残す(図4H、表3)。
- 異方性シリコンエッチング:ボッシュプロセスの5サイクルを繰り返して、≈ 2 μmで空洞を深めます(図4I、表5)。このステップは、次のステップで二重に再入可能な機能の背後にあるシリコンを除去するために必要です。ピラニア溶液を使用してウエハーを清掃します。
- 等方性シリコンエッチング:表4に記載されたプロセスパラメータを用いて、シリコンの等方性エッチングを2分および30sで行う。このステップは、空洞の口で熱成長した酸化物の後ろに空の空間(≈2 μm)を作り出し、二重に再入可能なエッジに導きます(図4J)。
- 異方性シリコンエッチング:ボッシュプロセスレシピ(ステップ5.1)を160サイクル使用して、空洞の深さを50μmのhc ≈ 50 μm(図4K、表5)に増やします。
- ウェーハのクリーニングおよび貯蔵:ピラニア溶液を使用してウェーハを洗浄し、上記のステップ5.4で説明したように保管してください。
ピラーSの微細加工
リエントラントおよび二重リエントラント柱と「ハイブリッド」(壁に囲まれた二重リエントラント柱からなる)を製造するための設計プロトコルは、ウエハー調製、シリカエッチング、および特定のシリコンエッチングの3つの重要なステップで構成されています。図 5A–Cは再入可能な柱と二重に再入可能な柱のレイアウト設計のトップビューを示し、図 5D–Fはハイブリッド アレイのレイアウトを示します。同じフォトレジスト(AZ5214E)を使用したパターンを除き、ウエハ全体を露出させるには、UV露光の暗視野オプションを選択します(図6A–Cおよび図7A-C)。これらの特異性に加えて、ウエハ(ステップ2)とエッチングシリカ(ステップ4)を洗浄する工程は同一である。
7. リエントラント・ピラーズ
- 異方性シリコンエッチング:フォトリソグラフィ、UV露光、開発、および上記の柱に対する特異性を有するシリカをエッチングした後(ステップ1~4)、ウェーハを深いICP-RIE系に移し、ボッシュ法を用いてシリコン層をエッチングする。このステップは、柱の高さを制御します。ボッシュプロセスの160サイクルを使用して、高さの柱、hP ≈ 30 μm(図6E、表5)を達成します。ステップ2で説明したようにウエハを清掃する。
- 等方性シリコンエッチング:SF6を用いて5分間等方性エッチングを行い、柱上に再入可能なエッジを作成します(図6F、表4)。オーバーハングの結果の長さは5μmです。
- ピラニアの清掃および保管:ピラニア溶液を使用してウェーハを洗浄し、上記のステップ5.4で説明したように保管してください。
8. 二重リエントラントピラーとハイブリッド
- 異方性シリコンエッチング:SiO2をエッチングした後、ウエハを深いICP-RIE系に移し、SiをSiO2層下にエッチングする。Etc2 μmのエッチング深さに対応するボッシュプロセスの5サイクルを実行します(図7E、表4)。続いて、ステップ(2)で説明した通りウエハを清掃する。
- 等方性シリコンエッチング:16sに対してSF6を用いて等方性エッチングを行い、再入可能なエッジを作成する(表5、図7F)。ステップ2で説明したようにウエハを清掃する。
- 熱酸化物の成長:ステップ6.3(図7G)で説明したように、高温炉システムを使用してウェハー全体に熱酸化物の500nm層を成長させる。
- シリカエッチング:ステップ6.4(図7H、表3)で説明したように、熱成長酸化層(500nm厚)を3分間エッチングする。
- 異方性シリコンエッチング:ボッシュプロセスの160サイクルを繰り返し(表4)、柱の高さを増やします(図7I)。上記のステップ2で説明した通りウエハを清掃する。
- 等方性シリコンエッチング:表4に記載されたプロセスパラメータを用いて、シリコンの等方性エッチングを5分間行う。このステップにより、二重に再入可能なエッジが作成されます (図 7J)。柱の幹と二重に再入可能なエッジの間のスペースは、≈2 μmです。
- ウェーハのクリーニングおよび貯蔵:ピラニア溶液を使用してウェーハを洗浄し、上記のステップ5.4で説明したように保管してください。
図8は、マイクロファブリケート再入可能で二重に再入可能なキャビティとピラーで使用されるプロセスのリストを表しています。
結果
このセクションでは、上記のプロトコルを使用して再入可能なキャビティ(DCとDRC、図9)、および再入可能で二重に再入可能な柱(RPとDRP、図10)をマイクロファブリカチで紹介します。すべてのキャビティは直径、DC = 200 μm、深さ、hC ≈ 50 μm、および隣接するキャビティ間の中心間距離 (またはピッチ) を持ち、LC = DC + 12 μm になります。同じ製造プロトコルを使用して、以前に報告されたように、非円形の空洞も準備することができます。
柱上部のキャップの直径はDP=20μmで、高さとピッチはそれぞれ、hp ≈ 30 μm、L P = 100 μmであった(図10)。
ガスを捕捉するマイクロテクスチャ(GEMs)の湿潤挙動
平らなシリカ(SiO2)は、ほとんどの極性および非極性液体に対して本質的に濡れています。例えば、シリカ上の六方の液滴(γLV=20mN/m)と水(20°Cでの表面張力γ=72.8mN/m)の固有接触角は、それぞれ、θo ≈ 20°とθo≈ 40°であった。しかし、再入可能な二重再入可能キャビティ(DRC)と柱を微細に作製した後、接触角は劇的に変化した(表6)。液体を0.2μL/sの速度で分配/後退させることで前進/後退接触角を測定し、両方の液体の明らかな接触角θr > 120°(オムニフォビック;図 11E)。柱ベースのマイクロテクスチャなど、マイクロテクスチャに不連続性がないため、接触角度θr ≈ 0° を後退させる。一方、二重再入可能な柱(DRP)のアレイを有するSiO2/Si表面は、明らかな接触角を示し、液体の両方に対してθr>150°、および接触角ヒステリシスは最小限であった(超不眠運動、図11Aおよび映画S1およびS2)。不思議なことに、柱の配列を持つ同じSiO2/Si表面が同じ液体に浸かったとき、彼らは瞬時に侵入し、t < 1 s、すなわち空気は閉じ込められなかった(図10A-D、ムービーS3)。したがって、柱は接触角度の面で超オムニフォビックであるように見えましたが、浸漬時に空気を捕らえることができませんでした。実際、湿潤液体はマイクロテクスチャの境界(または局所的な欠陥)から侵入し、閉じ込められた空気を瞬時に変えます(図11A-DおよびムービーS3)。対照的に、DRCは両方の液体に浸漬したときに空気を閉じ込めました(図11E–HおよびS1、表1)。ヘキサデカンの場合、閉じ込められた空気は1ヶ月26以降もそのままであった。私たちの共焦点顕微鏡実験では、張り出した特徴が侵入する液体を安定させ、その中に空気を吸い込む(図12A-B)。
次に、DRP の配列に空気を封じ込めるために、同じマイクロファブリケーション プロトコルを使用して、二重に再入可能なプロファイルの壁に囲まれた柱の配列を実現しました (図 10G-I)。この戦略は、液体を濡らすることから、DRPの茎を絶縁しました。その結果、共焦点顕微鏡(図12C-D)および映画S4、表6で確認されたとおり、ハイブリッドマイクロテクスチャはGEMsとして動作する。したがって、ハイブリッドマイクロテクスチャを有するシリカ表面は、空気をトラップすることによって浸漬に対してオムニフォビシティを示し、接触角度θr>120°(オムニフォビック)を実証し、真の意味でオムニフォビック、すなわち接触角度および浸漬に空気を閉じ込めることが証明された。 表6では、SiO2/Si表面のオムニフォビシティを、様々なマイクロテクスチャキャビティベース、ピラーベース、ハイブリッドを接触角度と浸漬で評価しています。
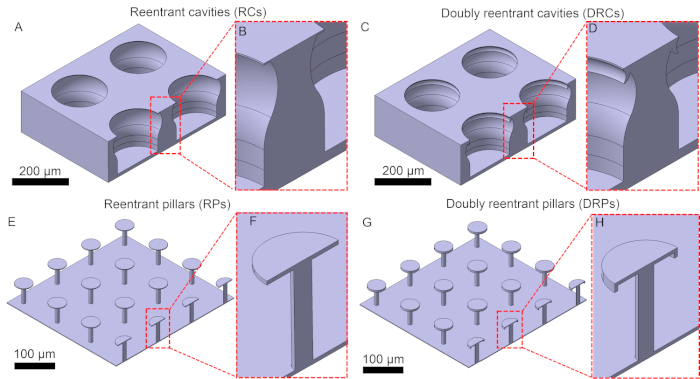
図1:微細構造の概略図(A–B)再入可能なキャビティ、(C–D) 二重に再入可能なキャビティ, (E–F) 再入可能な柱,(G–H) 二重に再入可能な柱.この図の大きなバージョンを表示するには、ここをクリックしてください。
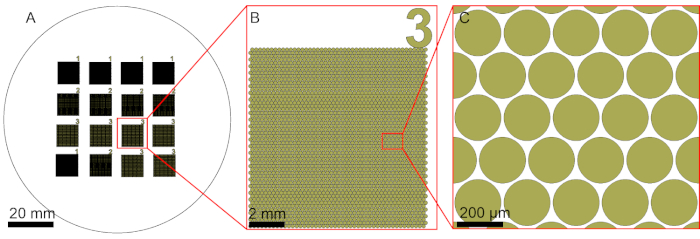
図2:キャビティの設計パターンレイアウト ソフトウェアを使用して生成される再入可能キャビティと二重再入キャビティの設計パターン。パターンをフォトリソグラフィを用いてウェーハ上に転写した。この図の大きなバージョンを表示するには、ここをクリックしてください。

図3:再入可能キャビティの微細加工プロトコル(A) 上に厚さ2.4 μmのシリコンウエハーを上に置く。(B) ウエハをフォトレジストでスピンコートし、UV光に曝します。(C) UV 露出フォトレジストを開発して、デザイン パターンを取得します。(D) 露出したトップシリカ層のエッチング(異方性エッチング)誘導結合プラズマ(ICP)反応イオンエッチング(RIE)を用いた。(E) 深いICP-RIEを用いた露出シリコン層の浅い異方性エッチング。(F)シリコンの等方性エッチングにより、再入可能なエッジを作成する。(G) 深部異方性シリコンエッチングにより、空洞の深さを増加させる。この図の大きなバージョンを表示するには、ここをクリックしてください。
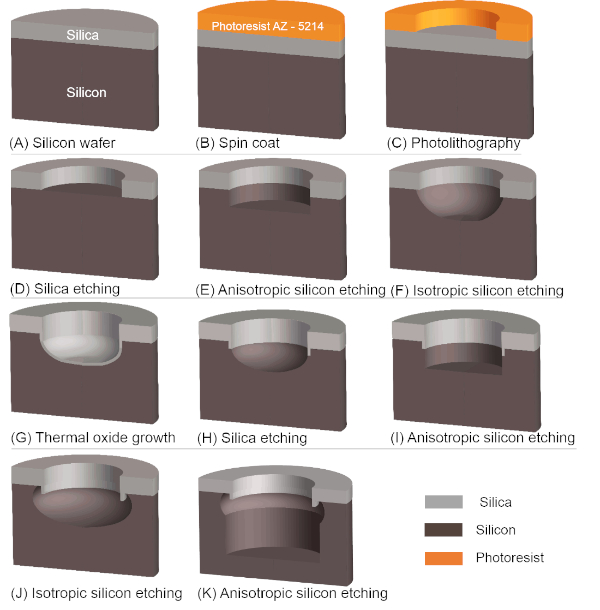
図4:二重再入可能キャビティのためのマイクロファブリケーションプロトコル。(A) 上に厚さ2.4 μmのシリコンウエハーを上に置く。(B) ウエハをフォトレジストでスピンコートし、UV光に曝します。(C) UV 露出フォトレジストを開発して、デザイン パターンを取得します。(D) 露出したトップシリカ層のエッチング(異方性エッチング)誘導結合プラズマ(ICP)反応イオンエッチング(RIE)を用いた。(E) 深いICP-RIEを用いた露出シリコン層の浅い異方性エッチング。(F)深いICP-RIEを用いてアンダーカットを作成するシリコンの浅い等方性エッチング。(G) 熱酸化物の増殖。(H)上方および底部シリカ層の異方性エッチング。(I) シリコンの浅い異方性エッチング。(J)等方性シリコンエッチングにより、二重に再入可能なエッジを作成します。(K) 深部異方性シリコンエッチングにより、空洞の深さを増加させます。この図の大きなバージョンを表示するには、ここをクリックしてください。

図 5: 柱の設計パターンレイアウト ソフトウェアを使用して生成されるリエントラント、二重リエントラント、ハイブリッド ピラーの設計パターン。パターンをフォトリソグラフィを用いてウェーハ上に転写した。この図の大きなバージョンを表示するには、ここをクリックしてください。
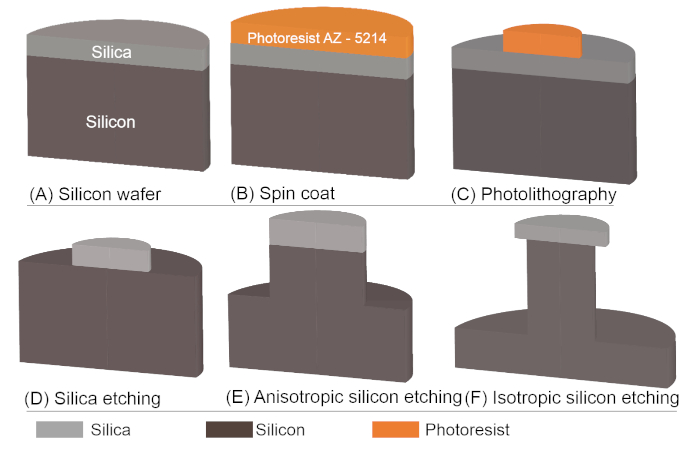
図6:リエントラント柱の微細加工プロトコル(A) 上に厚さ2.4 μmのシリコンウエハーを上に置く。(B) ウエハをフォトレジストでスピンコートし、UV光に曝します。(C) UV 露出フォトレジストを開発して、デザイン パターンを取得します。(D) 露出したトップシリカ層のエッチング(異方性エッチング)誘導結合プラズマ(ICP)反応イオンエッチング(RIE)を用いた。(E) 深部異方性シリコンエッチングにより、柱の高さを高くする。(F) 等方性シリコンエッチングにより、再入可能エッジを作成する。この図の大きなバージョンを表示するには、ここをクリックしてください。
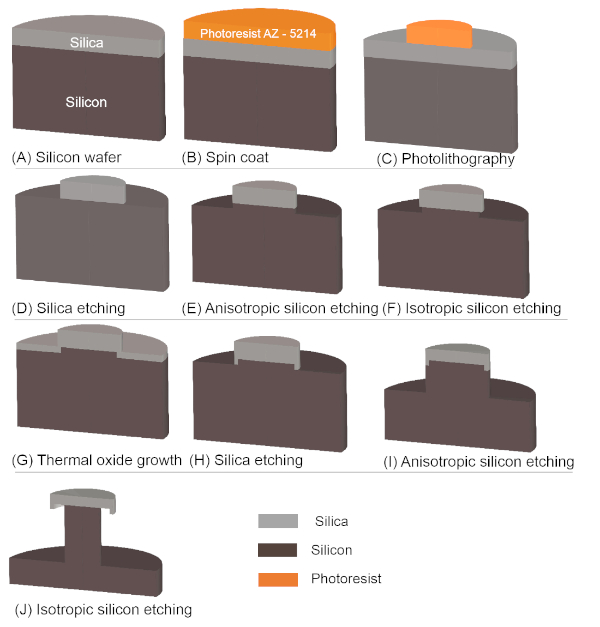
図 7: 二重再入可能な柱のためのマイクロファブリケーション プロトコル。(A) 上に厚さ2.4 μmのシリコンウエハーを上に置く。(B) ウエハをフォトレジストでスピンコートし、UV光に曝します。(C) UV 露出フォトレジストを開発して、デザイン パターンを取得します。(D) 露出したトップシリカ層のエッチング(異方性エッチング)誘導結合プラズマ(ICP)反応イオンエッチング(RIE)を用いた。(E) 深いICP-RIEを用いた露出シリコン層の浅い異方性エッチング。(F)深いICP-RIEを用いてアンダーカットを作成するシリコンの浅い等方性エッチング。(G) 熱酸化物の増殖。(H)シリカ層の上下の異方性エッチング。(I)異方性シリコンエッチングは、柱の高さを高くする。(J) 等方性シリコンエッチングにより、二重に再入可能なエッジを作成します。二重に再入可能な柱と「ハイブリッド」の唯一の違いは、最初の設計であることに注意してください。この図の大きなバージョンを表示するには、ここをクリックしてください。

図8:再入可能および二重再入可能なキャビティおよび柱のための微細加工プロトコル。フローチャートには、関連する主要な手順が一覧表示されます。この図の大きなバージョンを表示するには、ここをクリックしてください。
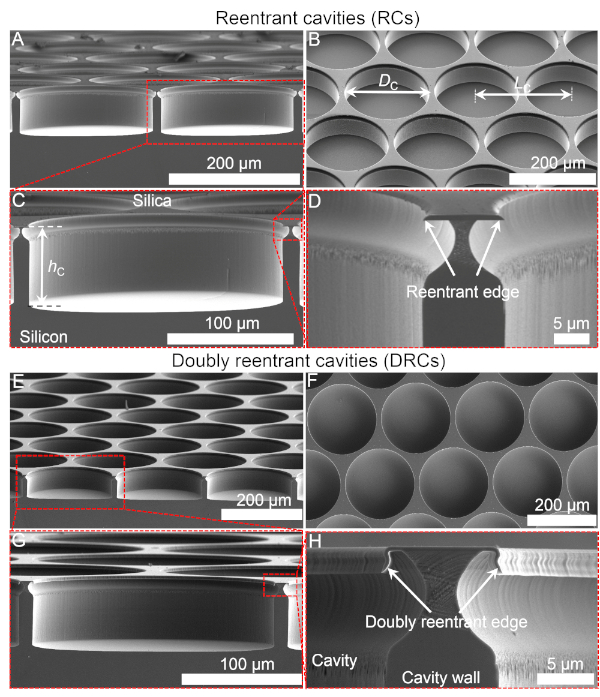
図9:再入可能および二重再入可能な空洞の走査型電子顕微鏡写真。(A-D)リエントラントキャビティの配列を持つシリカ表面の断面図と等角図。(E–H)二重の再入可能な空洞の断面およびトップビュー。DC = 空洞の直径とLC = 隣接する空洞間の中心から中心までの距離 (またはピッチ) とhC = キャビティの深さ。この図の大きなバージョンを表示するには、ここをクリックしてください。
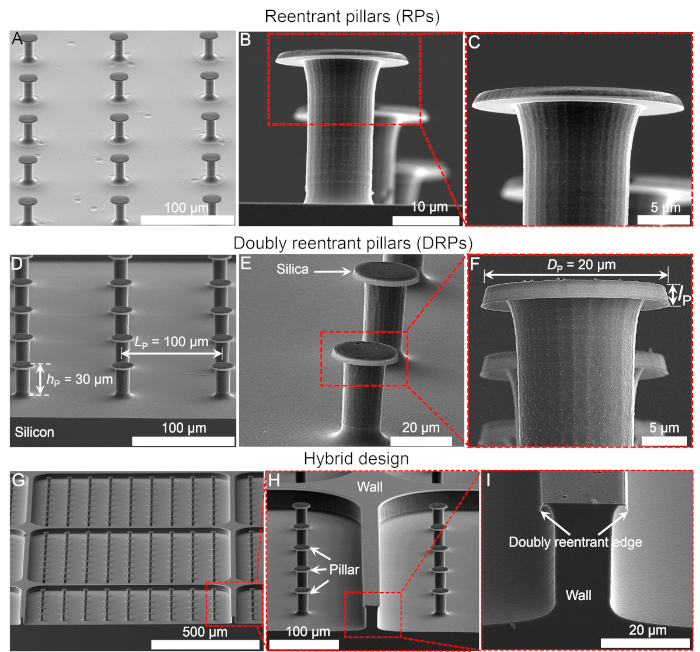
図10:再入可能な柱と二重に再入可能な柱の走査型電子顕微鏡写真。(A-C)再入可能柱の等角投影図。(D–F)二重に再入可能な柱。(G-I)ハイブリッドピラー - 二重に再入可能な壁に囲まれたDRP。柱キャップとLPの直径 - 隣接する柱 (ピッチ) 間の中心から中心までの距離、およびhP – 柱の高さ。図D–I、エルゼビアの許可を得て、参照35、著作権(2019)から転載。この図の大きなバージョンを表示するには、ここをクリックしてください。

図 11: ぬれ動作(A) 配列で飾られた SiO2/Si 表面の超オムニフォビシティ二重に再入可能な柱, 上に液体の滴を置くことによって観察.(B-D)濡れた液体が境界や局所的な欠陥に触れると、超オムニオ不全性は瞬時に失われます。(E) 配列で飾られた SiO2/Si サーフェスは、二重に再入可能なキャビティは、オムニフォビシティを示します。(F-H)これらのマイクロテクスチャは空気を強固に吸い込み、液体が境界や局在的欠陥に触れた場合にそれを失わない。エルゼビアの許可を得て、Ref.35、著作権(2019)から転載。この図の大きなバージョンを表示するには、ここをクリックしてください。

図12:液体に浸漬した微小質の共焦点顕微鏡。(A、C)水、および(B、D)ヘキサデカンの浸漬の5分後にz ≈ 5 mm柱に浸漬された二重の再入可能なキャビティとハイブリッドピラーを有するシリカ表面の代表的な共焦点画像(点線に沿った等角および断面)のコンピュータ強化された3D再構成。(偽)青と黄色の色は、閉じ込められた空気と水と六角形のインターフェイスに対応しています。浸込液性月経は二重再入可能な縁部で安定化した。(スケールバー=キャビティの直径とピラー200μmと20μmをそれぞれ。図12は、エルゼビアの許可を得て、Ref.35、著作権(2019)から転載されました。この図の大きなバージョンを表示するには、ここをクリックしてください。
| ステージ1:脱水とチャンバーからの酸素のパージ | ||
| ステップ | プロセスシーケンス | 時間(分) |
| 1 | 真空 (10 Torr) | 1 |
| 2 | 窒素(760トル) | 3 |
| 3 | 真空 (10 Torr) | 1 |
| 4 | 窒素(760トル) | 3 |
| 5 | 真空 (10 Torr) | 1 |
| 6 | 窒素(760トル) | 3 |
| ステージ2:プライミング | ||
| プロセスシーケンス | 時間(分) | |
| 7 | 真空 (1 Torr) | 2 |
| 8 | HMDS (6トール) | 5 |
| ステージ3:プライムエキゾーストのパージ | ||
| プロセスシーケンス | 時間(分) | |
| 9 | 真空 | 1 |
| 10 | 窒素 | 2 |
| 11 | 真空 | 2 |
| ステージ4:大気への回帰(バックフィル) | ||
| プロセスシーケンス | 時間(分) | |
| 12 | 窒素 | 3 |
表1:シリカ表面とAZ-5214Eフォトレジストとの間の接着性を高めるためのヘキサメチルジシナザン(HMDS)層のコーティングのプロセス詳細。
| ステップ | 速度(rpm) | ランプ(rpm/s) | 時間 (複数可) |
| 1 | 800 | 1000 | 3 |
| 2 | 1500 | 1500 | 3 |
| 3 | 3000 | 3000 | 30 |
表2:スピンコーティングによるSiO2/Siウエハース上の1.6μm厚AZ-5214Eフォトレジスト層を達成するためのプロセス詳細。
| RF 電源、(W) | ICP 電源、(W) | エッチング圧力、(mTorr) | C4F8フロー(sccm) | O2フロー(sccm) | 温度, (°C) |
| 100 | 1500 | 10 | 40 | 5 | 10 |
表3:誘導結合プラズマ-反応性イオンエッチング(ICP-RIE)で使用されるシリカエッチングのパラメータ設定。
| RF 電源、(W) | ICP 電源、(W) | エッチング圧力、(mTorr) | SF6フロー、(sccm) | 温度, (°C) |
| 20 | 1800 | 35 | 110 | 15 |
表4:誘導結合プラズマに使用されるシリコンエッチング(等方性)のパラメータ設定 - 深い反応性イオンエッチング(ICP-DRIE)。
| ステップ | RF 電源、(W) | ICP 電源、(W) | エッチング圧力、(mTorr) | SF6フロー、(sccm) | C4F8フロー(sccm) | 温度, (°C) | 蒸着/エッチング時間、(s) |
| パッシベーション層 | 5 | 1300 | 30 | 5 | 100 | 15 | 5 |
| エッチング | 30 | 1300 | 30 | 100 | 5 | 15 | 7 |
表5:誘導結合プラズマに使用されるシリコンエッチング(異方性)のパラメータ設定 - 深い反応性イオンエッチング(ICP-DRIE)。
| 表面 | 基準: 空気中の接触角度 | 基準: 浸漬 | |||
| 水 | ヘキサデカン | 水 | ヘキサデカン | ||
| ドップ | θr | 153°±1° | 153° ± 1° | 瞬間的な浸透 | 瞬間的な浸透 |
| θA | 161°±2° | 159° ± 1° | |||
| θR | 139°±1° | 132° ± 1° | |||
| 評価: | 超オムニフォビック | オムニフォビックではない - 実際には、オムニフィカル | |||
| ドラックス | θr | 124° ± 2° | 115° ± 3° | 閉じ込められた空気(オムニフォビック) | 閉じ込められた空気(オムニフォビック) |
| θA | 139° ± 3° | 134° ± 5° | |||
| θR | 0° | 0° | |||
| 評価: | オムニフォビック | オムニフォビック | |||
| ハイブリッド | θr | 153°±2° | 153° ± 2° | 閉じ込められた空気(オムニフォビック) | 閉じ込められた空気(オムニフォビック) |
| θA | 161°±2° | 159° ± 2° | |||
| θR | 0° | 0° | |||
| 評価: | オムニフォビック | オムニフォビック | |||
表6:接触角測定–前進(θA)、後退(θR)、および明らかな(θr)、および液体中の浸漬。このテーブルは、エルゼビアの許可を得て、Ref.35、著作権 (2019) から転載されました。
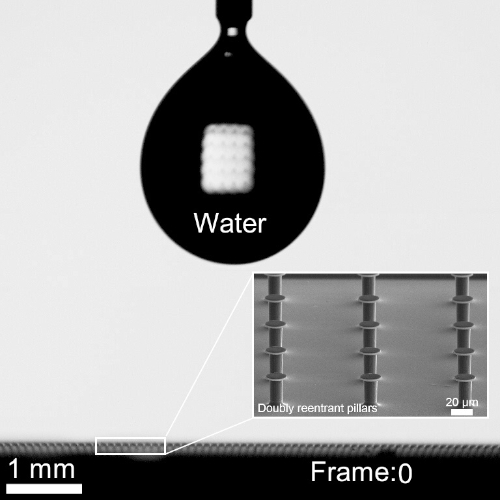
ムービー S1: 二重に再入可能な柱から成るマイクロテクスチャサーフェスから跳ね返る水滴の高速画像シーケンス(15K fps)。この映画はref 35から転載されました。著作権(2019)、エルゼビアの許可を得て。このビデオを見るには、ここをクリックしてください(右クリックしてダウンロードしてください)。
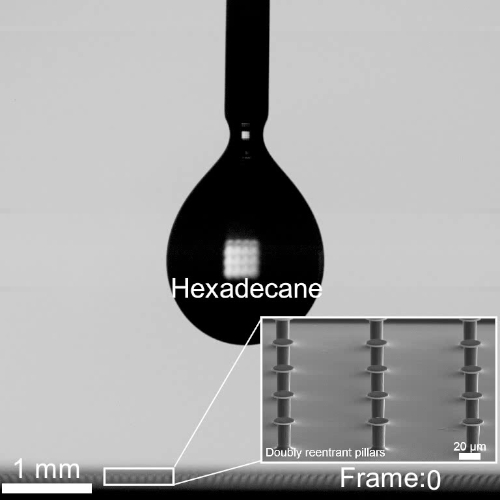
映画S2:二重に再入可能な柱からなるマイクロテクスチャ面から跳ね返るヘキサデカン液滴の高速画像シーケンス(19K fps)。この映画はref 35から転載されました。著作権(2019)、エルゼビアの許可を得て。このビデオを見るには、ここをクリックしてください(右クリックしてダウンロードしてください)。
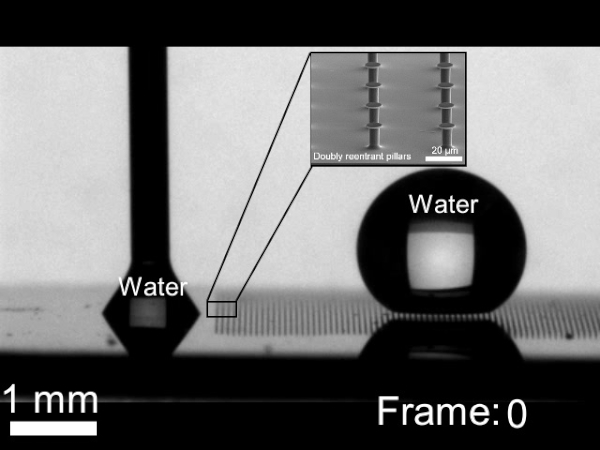
映画S3:二重に再入可能な柱からなるマイクロテクスチャへの水のインビビビションの画像シーケンス(200 fps)。この映画はref 35から転載されました。著作権(2019)、エルゼビアの許可を得て。このビデオを見るには、ここをクリックしてください(右クリックしてダウンロードしてください)。
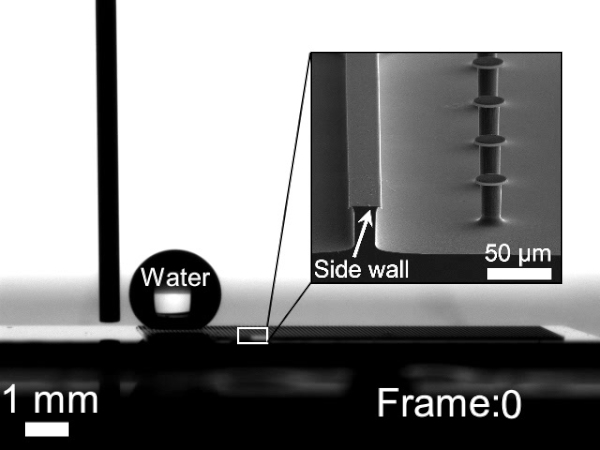
映画S4:ハイブリッドマイクロテクスチャの隣に進む画像シーケンス(200 fps)の水滴。二重再入可能な境界壁の存在は、マイクロテクスチャへの液体の侵入を防ぎ、表面を浸漬下でオムニフォビックにする。この映画はref 35から転載されました。著作権(2019)、エルゼビアの許可を得て。このビデオを見るには、ここをクリックしてください(右クリックしてダウンロードしてください)。
ディスカッション
ここでは、これらの微細加工プロトコルを適用する際に読者を助けるために、追加の要因と設計基準について説明します。キャビティ マイクロテクスチャ(DC および DRC)では、ピッチの選択が重要です。隣接する空洞間の薄い壁は、液体固体界面領域が低く、液体蒸気界面領域が高くなり、高い見かけの接触角34につながる。しかし、壁が薄いと、例えば、処理や特性評価の間に、マイクロテクスチャの機械的完全性を損なう可能性があります。薄い壁(例えば、ステップ6.6)で少しオーバーエッチングすると、マイクロテクスチャ全体が破壊される可能性があります。薄い壁でアンダーエッチングはまた二重に再入可能な特徴の開発を防ぐことができる。DRCの特徴が完全に開発されていない場合、特に液体が空洞の内部で凝縮する場合、長期間空気を捕捉する能力が損なわれる可能性があります。このため、実験では、L = D + 12 μm (つまり、空洞間の最小壁厚は 12 μm) を選択しました。また、L = D + 5 μmの小さいピッチで二重に再入可能なキャビティを製造しましたが、得られた表面は微細加工中の構造的損傷のために均質ではありませんでした。
ステップ4でC4F8およびO2を用いたシリカ層のエッチング中、反応チャンバの使用または清浄性の以前の履歴は、例えば、ほとんどの大学のような一般的なユーザー施設で、同じステップに従うにもかかわらず、可変結果を与えることができた。したがって、このステップは、例えば、それぞれ5分以下の短い期間で行われることを推奨し、反射測定などの独立した技術によってシリカ層の厚さを監視した。厚さ2.4μmのシリカ層を持つウエハースの場合、典型的なエッチングルーチンは、対象領域からシリカを完全に除去するのに13分かかりました(表3)。この工程は、プロセス中にもエッチングされたため、フォトレジストによって最初にマスクされたシリカ層の1μmを除去した。さらに、エッチングレートが期待通りであることを確実にし、以前のエッチング工程からのクロスコンタミネーション(マルチユーザ施設で共通の問題点)を回避するため、シリカエッチングは常に犠牲ウエハを予防工程としてエッチングして行いました。フォトレジストの開発中に、露出した表面がフォトレジストの痕跡/粒子で汚染され、ピン残基の形成につながる(顕微鏡的な)マスクとして作用する可能性があります。これを回避するには、微細加工プロセス全体を通して厳格なクリーニングおよびストレージプロトコルに従う必要があります。
同様に、ボッシュのプロセス中に、SiO2層は下のSi層のマスクとして機能するが、それは遅い速度ではあるが、長いエッチングサイクルの間にエッチングされる。従って、キャビティの深さまたは柱の高さは、再入可能な特徴が損なわれない点まで制限される。ボッシュプロセス中のパッシベーションとエッチング時間は、滑らかな壁を得るために調整する必要があります。これは、レシピを反復的にテストし、例えば電子顕微鏡を使用してサンプルに及ぼす影響を観察することによって達成することができます。
RPおよびDRPの場合、等方性エッチングの持続時間が長いほど、ステムの直径は小さくなります。直径が10μm未満の場合、機械的な脆弱性を引き起こしうる。この制限は、マイクロファブリケーション手順の開始時に設計を通知する必要があります。
大学で一般的に入手可能なドライエッチングツールは工業グレードの公差を持たないので、チャンバー内のエッチング速度の面で空間的な不均一性を引き起こしています。したがって、ウェーハの中央で得られる特徴は、境界の特徴と同じでないかもしれない。この限界を克服するために、我々は4インチのウエハーを使用し、中央地域にのみ集中しました。
また、フォトリソグラフィにハードコンタクトマスクを使用する代わりに直接書き込みシステムを使用することを推奨し、特徴の直径、ピッチ、形状(円形、六角形、正方形)などの設計パラメータを迅速に変更できます。
明らかに、SiO2/Siウエハースもフォトリソグラフィーも、オムニフォビック表面の大量生産に必要な材料またはプロセスではありません。しかし、バイオミメティクス26、27、34、35、46、47など、オムニフォビック表面をエンジニアリングするための革新的なマイクロテクスチャを探求する優れたモデルシステムとして機能し、アプリケーション用の低コストでスケーラブルな材料システムに翻訳することができます。近い将来、GEMの設計原理は、3Dプリンティング48、アディティブマニュファクチャリング49、レーザーマイクロマシニング50などの技術を使用してスケールアップされる可能性があります。マイクロテクスチャSiO2/Si表面は、柔らかい材料29、51をテンプレートに使用することもできます。現在、キャビテーションダメージ47、海水淡水化46、52、および流体力学的抗力の低減を抑制するためのガス捕捉表面の応用を調査しています。
開示事項
著者らは、彼らが競合する利益を持っていないと宣言します。
謝辞
HMは、キングアブドラ科学技術大学(KAUST)からの資金提供を認めています。
資料
| Name | Company | Catalog Number | Comments |
| AZ-5214 E photoresist | Merck | DEAA070796-0W59 | Photoresist, flammable liquid |
| AZ-726 MIF developer | Merck | 10055824960 | To develop photoresist |
| Confocal microscopy | Zeiss | Zeiss LSM710 | Upright confocal microscope to visualize liquid meniscus shape |
| Deep ICP-RIE | Oxford Instruments | Plasmalab system100 | Silicon etching tool |
| Direct writer | Heidelberg Instruments | µPG501 | Direct-writing system |
| Drop shape analyzer | KRUSS | DSA100 | To measure contact angle |
| Hexadecane | Alfa Aesar | 544-76-3 | Test liquid |
| Highspeed imaging camera | Phantom vision research | v1212 | To image droplet bouncing |
| HMDS vapor prime | Yield Engineering systems | ||
| Hot plate | Cost effective equipments | Model 1300 | |
| Hydrogen peroxide 30% | Sigma Aldrich | 7722-84-1 | To prepare piranha solution |
| Imaris software | Bitplane | Version 8 | Post process confocal microscopy images |
| Nile Red | Sigma Aldrich | 7385-67-3 | Fluorescent dye for hexadecane |
| Nitrogen gas | KAUST lab supply | To dry the wafer | |
| Petri dish | VWR | HECH41042036 | |
| Reactive-Ion Etching (RIE) | Oxford Instruments | Plasmalab system100 | Silica etching tool |
| Reflectometer | Nanometrics | Nanospec 6100 | To check remaining oxide layer thickness |
| Rhodamine B (Acros) | Fisher scientific | 81-88-9 | Fluorescent dye for water |
| SEM stub | Electron Microscopy Sciences | 75923-19 | |
| SEM-Quanta 3D | FEI | Quanta 3D FEG Dual Beam | |
| Silicon wafer | Silicon Valley Microelectronics | Single side polished, 4" diameter, 500 µm thickness, 2.4 µm thick oxide layer | |
| Spin coater | Headway Research,Inc | PWM32 | |
| Spin rinse dryer | MicroProcess technology | Avenger Ultra -Pure 6 | Dry the wafers after piranha clean |
| Sulfuric acid 96% | Technic | 764-93-9 | To prepare piranha solution |
| Tanner EDA L-Edit software | Tanner EDA, Inc. | version15 | Layout design |
| Thermal oxide growth | Tystar furnace | To grow thermal oxide in patterned silicon wafer | |
| Tweezers | Excelta | 490-SA-PI | Wafer tweezer |
| Vacuum oven | Thermo Scientific | 13-258-13 | |
| Water | Milli-Q | Advantage A10 | Test liquid |
参考文献
- Butt, H. J., et al. Characterization of super liquid-repellent surfaces. Current Opinion in Colloid & Interface Science. 19 (4), 343-345 (2014).
- Lee, J., Laoui, T., Karnik, R. Nanofluidic transport governed by the liquid/vapour interface. Nature Nanotechnology. 9 (4), 317-323 (2014).
- Subramanian, N., et al. Evaluating the potential of superhydrophobic nanoporous alumina membranes for direct contact membrane distillation. Journal of Colloid and Interface Science. 533, 723-732 (2019).
- Xue, Z. X., Cao, Y. Z., Liu, N., Feng, L., Jiang, L. Special wettable materials for oil/water separation. Journal of Materials Chemistry A. 2 (8), 2445-2460 (2014).
- Zhang, L. B., Zhong, Y. J., Cha, D., Wang, P. A self-cleaning underwater superoleophobic mesh for oil-water separation. Scientific Reports. 3, (2013).
- Leslie, D. C., et al. A bioinspired omniphobic surface coating on medical devices prevents thrombosis and biofouling. Nature Biotechnology. 32 (11), 1134-1140 (2014).
- Lee, C., Choi, C. H., Kim, C. J. Superhydrophobic drag reduction in laminar flows: a critical review. Experiments in Fluids. 57 (176), (2016).
- Tuteja, A., Choi, W., Mabry, J. M., McKinley, G. H., Cohen, R. E. Robust omniphobic surfaces. Proceedings of the National Academy of Sciences of the United States of America. 105 (47), 18200-18205 (2008).
- Brown, P. S., Bhushan, B. Mechanically durable, superoleophobic coatings prepared by layer-by-layer technique for anti-smudge and oil-water separation. Scientific Reports. 5, (2015).
- Wong, T. S., et al. Bioinspired self-repairing slippery surfaces with pressure-stable omniphobicity. Nature. 477 (7365), 443-447 (2011).
- Milionis, A., Dang, K., Prato, M., Loth, E., Bayer, I. Liquid repellent nanocomposites obtained from one-step water-based spray. Journal of Materials Chemistry A. 3 (24), 12880-12889 (2015).
- Mishra, H., et al. Time-Dependent Wetting Behavior of PDMS Surfaces with Bioinspired, Hierarchical Structures. ACS Applied Materials & Interfaces. 8 (12), 8168-8174 (2016).
- Hendren, Z. D., Brant, J., Wiesner, M. R. Surface modification of nanostructured ceramic membranes for direct contact membrane distillation. Journal of Membrane Science. 331 (12), 1-10 (2009).
- Rezaei, M., et al. Wetting phenomena in membrane distillation: Mechanisms, reversal, and prevention. Water Research. 139, 329-352 (2018).
- Verho, T., et al. Mechanically Durable Superhydrophobic Surfaces. Advanced Materials. 23, 673-678 (2011).
- Boinovich, L., Emelyanenko, A. M., Pashinin, A. S. Analysis of Long-Term Durability of Superhydrophobic Properties under Continuous Contact with Water. ACS Applied Materials & Interfaces. 2 (6), 1754-1758 (2010).
- Herminghaus, S. Roughness-induced non-wetting. Europhysics Letters. 52 (2), 165-170 (2000).
- Abdelsalam, M. E., Bartlett, P. N., Kelf, T., Baumberg, J. Wetting of regularly structured gold surfaces. Langmuir. 21 (5), 1753-1757 (2005).
- Liu, J. L., Feng, X. Q., Wang, G. F., Yu, S. W. Mechanisms of superhydrophobicity on hydrophilic substrates. Journal of Physics-Condensed Matter. 19 (35), (2007).
- Nosonovsky, M. Multiscale roughness and stability of superhydrophobic biomimetic interfaces. Langmuir. 23 (6), 3157-3161 (2007).
- Marmur, A. From hygrophilic to superhygrophobic: Theoretical conditions for making high-contact-angle surfaces from low-contact-angle materials. Langmuir. 24 (14), 7573-7579 (2008).
- Hensel, R., et al. Wetting Resistance at Its Topographical Limit: The Benefit of Mushroom and Serif T Structures. Langmuir. 29 (4), 1100-1112 (2013).
- Bormashenko, E. Progress in understanding wetting transitions on rough surfaces. Advances in Colloid and Interface Science. 222, 92-103 (2015).
- Patankar, N. A. Thermodynamics of trapping gases for underwater superhydrophobicity. Langmuir. 32 (27), 7023-7028 (2016).
- Kaufman, Y., et al. Simple-to-Apply Wetting Model to Predict Thermodynamically Stable and Metastable Contact Angles on Textured/Rough/Patterned Surfaces. The Journal of Physical Chemistry C. 121 (10), 5642-5656 (2017).
- Domingues, E. M., Arunachalam, S., Nauruzbayeva, J., Mishra, H. Biomimetic coating-free surfaces for long-term entrapment of air under wetting liquids. Nature Communications. 9 (1), 3606 (2018).
- Liu, T. Y., Kim, C. J. Turning a surface superrepellent even to completely wetting liquids. Science. 346 (6213), 1096-1100 (2014).
- Hensel, R., Neinhuis, C., Werner, C. The springtail cuticle as a blueprint for omniphobic surfaces. Chemical Society Reviews. 45 (2), 323-341 (2016).
- Hensel, R., et al. Biologically Inspired Omniphobic Surfaces by Reverse Imprint Lithography. Advanced Materials. 26 (13), 2029-2033 (2014).
- Hensel, R., et al. Tunable nano-replication to explore the omniphobic characteristics of springtail skin. Npg Asia Materials. 5, (2013).
- Helbig, R., Nickerl, J., Neinhuis, C., Werner, C. Smart Skin Patterns Protect Springtails. PLOS ONE. 6 (9), 25105 (2011).
- Cheng, L. Marine and Freshwater Skaters: Differences in Surface Fine Structures. Nature. 242, 132 (1973).
- Andersen, N. M., Cheng, L. The marine insect Halobates (Heteroptera: Gerridae): biology, adaptations, distribution, and phylogeny. Oceanography and marine biology: an annual review. 42, 119-180 (2004).
- Domingues, E. M., Arunachalam, S., Mishra, H. Doubly Reentrant Cavities Prevent Catastrophic Wetting Transitions on Intrinsically Wetting Surfaces. ACS Applied Materials & Interfaces. 9 (25), 21532-21538 (2017).
- Arunachalam, S., Das, R., Nauruzbayeva, J., Domingues, E. M., Mishra, H. Assessing omniphobicity by immersion. Journal of Colloid and Interface Science. 534, 156-162 (2019).
- Christian Koch, E. A. . Photolithography: Basics of Microstructuring. , (2017).
- Jansen, H., de Boer, M., Legtenberg, R., Elwenspoek, M. The black silicon method: a universal method for determining the parameter setting of a fluorine-based reactive ion etcher in deep silicon trench etching with profile control. Journal of Micromechanics and Microengineering. 5 (2), 115 (1995).
- Jansen, H. V., de Boer, M. J., Unnikrishnan, S., Louwerse, M., Elwenspoek, M. C. Black silicon method X: a review on high speed and selective plasma etching of silicon with profile control: an in-depth comparison between Bosch and cryostat DRIE processes as a roadmap to next generation equipment. Journal of Micromechanics and Microengineering. 19 (3), 033001 (2009).
- Xiu, Y., Zhu, L., Hess, D. W., Wong, C. Hierarchical silicon etched structures for controlled hydrophobicity/superhydrophobicity. Nano Letters. 7 (11), 3388-3393 (2007).
- Azeredo, B., et al. Silicon nanowires with controlled sidewall profile and roughness fabricated by thin-film dewetting and metal-assisted chemical etching. Nanotechnology. 24 (22), 225305 (2013).
- Coffinier, Y., et al. Preparation of superhydrophobic silicon oxide nanowire surfaces. Langmuir. 23 (4), 1608-1611 (2007).
- . L-Edit-The layout editor. Reference Manual Available from: https://usermanual.wiki/Document/LEdit20Manual.38314693/view (2009)
- . NANOSPEC 6100 Series Operators Users Manual Available from: https://cmi.epfl.ch/metrology/Nanospec_AFT6100_Manual.pdf (2019)
- Deal, B. E., Grove, A. General relationship for the thermal oxidation of silicon. Journal of Applied Physics. 36 (12), 3770-3778 (1965).
- Woollam, J. A., et al. Spectroscopic ellipsometry from the vacuum ultraviolet to the far infrared. AIP Conference Proceedings. 550 (1), 511-518 (2001).
- Das, R., Arunachalam, S., Ahmad, Z., Manalastas, E., Mishra, H. Bio-inspired gas-entrapping membranes (GEMs) derived from common water-wet materials for green desalination. Journal of Membrane Science. , 117185 (2019).
- Gonzalez-Avila, S. R., Nguyen, D. M., Arunachalam, S., Domingues, E. M., Mishra, H., Ohl, C. D. Mitigating cavitation erosion using biomimetic gas-entrapping microtextured surfaces. Science Advances. , (2020).
- Liu, X., et al. 3D Printing of Bioinspired Liquid Superrepellent Structures. Advanced Materials. 30 (22), 1800103 (2019).
- Jafari, R., Cloutier, C., Allahdini, A., Momen, G. Recent progress and challenges with 3D printing of patterned hydrophobic and superhydrophobic surfaces. The International Journal of Advanced Manufacturing Technology. , 1-14 (2019).
- Vorobyev, A. Y., Guo, C. L. Multifunctional surfaces produced by femtosecond laser pulses. Journal of Applied Physics. 117 (3), 033103 (2015).
- Xu, M., Kim, C. J. Method for manufacturing re-entrant microstructures. US Patent App. , (2018).
- Das, R., Arunachalam, S., Ahmad, Z., Manalastas, E., Syed, A., Buttner, U., Mishra, H. Proof-of-Concept for Gas-Entrapping Membranes Derived from Water-Loving SiO2/Si/SiO2 Wafers for Greener Desalination. Journal of Visualized Experiments. , e60583 (2020).
転載および許可
このJoVE論文のテキスト又は図を再利用するための許可を申請します
許可を申請さらに記事を探す
This article has been published
Video Coming Soon
Copyright © 2023 MyJoVE Corporation. All rights reserved