Method Article
Uso de microscopía de barrido láser para determinar la electromigración en disiliciuro de molibdeno
En este artículo
Resumen
Aquí, describimos un flujo de trabajo utilizando microscopía de escaneo láser para determinar el volumen electromigrado a través de una línea metálica bajo prueba. Variando diferentes variables experimentales, se puede adquirir una multitud de información sobre la electromigración. En este trabajo se determina la duración del inicio de la electromigración.
Resumen
Con el aumento de la densidad de corriente y la disminución del tamaño de los chips, la electromigración se vuelve cada vez más importante. La electromigración es el movimiento de átomos en un material conductor de electricidad causado por el flujo de corriente. Para el aluminio y el cobre, los parámetros de electromigración y sus dependencias han sido investigados por una multitud de personas y métodos. En el caso de otros materiales, este no es el caso. Los experimentos de electromigración a menudo utilizan tiempos muy largos para estresar las líneas bajo prueba en la mediana de los experimentos de fallo. Estos experimentos solo proporcionan información a nivel de superficie sobre la electromigración. Los métodos más sofisticados analizan los efectos e influencias microscópicas o a nanoescala. Por lo general, se utilizan equipos costosos como microscopios electrónicos de barrido (SEM), sincrotrones o microtomografía de rayos X para estas investigaciones. Se ha desarrollado un flujo de trabajo que permite la investigación de la electromigración a escala microscópica mediante el uso de un microscopio de barrido láser. Con esta técnica de escaneo láser, es posible conseguir resultados con una precisión ligeramente inferior a la del SEM pero con mucho menos esfuerzo en la preparación de las muestras.
Al conocerse el volumen electromigrado, se pueden utilizar los mismos procedimientos que con los volúmenes electromigrados determinados mediante SEM para calcular los parámetros de electromigración. Mediante la variación de diferentes variables experimentales, se puede obtener una multitud de información sobre la electromigración. En este trabajo se muestra la determinación de la duración para el inicio de la electromigración.
Introducción
La electromigración es la migración de iones metálicos causada por la corriente. Durante la electromigración, una fuerza  actúa sobre el ion metálico.
actúa sobre el ion metálico.
La fuerza  sobre un ion dentro de una línea conductora bajo prueba sin una capa encapsulante se puede calcular como:
sobre un ion dentro de una línea conductora bajo prueba sin una capa encapsulante se puede calcular como:

Siendo Z* la carga iónica efectiva para el ion en movimiento, siendo la carga de un electrón y  siendo el campo eléctrico1. Para un conductor
siendo el campo eléctrico1. Para un conductor  metálico con la resistividad específica ρ y la densidad
metálico con la resistividad específica ρ y la densidad  de corriente .
de corriente .
Z* depende de la especie iónica y del material de la línea bajo prueba. Su valor indica la fuerza de la electromigración, y su signo indica la dirección del movimiento del ion en cuestión.
Esta fuerza hace que los átomos se muevan y sean transportados en la línea metálica. Utilizando la relación entre la velocidad  del ion y la fuerza
del ion y la fuerza  motriz y la relación de Nernst-Einstein para la movilidad de los iones
motriz y la relación de Nernst-Einstein para la movilidad de los iones  , el flujo atómico (número de átomos por unidad de tiempo por unidad de área transportada por electromigración)
, el flujo atómico (número de átomos por unidad de tiempo por unidad de área transportada por electromigración)  se puede calcular como:
se puede calcular como:

siendo N la densidad de los átomos retulares, siendo el coeficiente de difusión D, siendo k la constante de Boltzmann y T la temperatura absoluta2.
El volumen electromigrado se puede describir como 2,3,4:
V = ΩJEMAt
Siendo A el área de la sección transversal del conductor, Ω el volumen atómico y t el tiempo de electromigración.
En el caso de las líneas encapsuladas sometidas a ensayo, hay que tener en cuenta un componente adicional en función de la tensión mecánica:

Siendo σxx la tensión normal a lo largo de la longitud de la muestra y x la coordenada a lo largo de la longitud de la línea bajo prueba1. Como se ha demostrado en otras publicaciones, esto da como resultado5:

La electromigración que genera tensión es un fenómeno bien conocido en las líneas de estado sólido bajo prueba.
Si  = 0 entonces el transporte
= 0 entonces el transporte  de masa = 0 (y V = 0), el producto crítico de la longitud l y la densidad de corriente para el inicio de la electromigración se puede relacionar con los parámetros de los materiales de la siguiente manera1:
de masa = 0 (y V = 0), el producto crítico de la longitud l y la densidad de corriente para el inicio de la electromigración se puede relacionar con los parámetros de los materiales de la siguiente manera1:

Este producto crítico es de gran importancia en el diseño de componentes o circuitos eléctricos, ya que las líneas con longitudes más cortas que la longitud crítica, también llamada longitud de Blech, son inmortales. En el siguiente protocolo, se muestra la determinación de (Ij)c . Si se conocen los otros parámetros, se puede calcular Z* como una cantidad de material importante.
Los métodos publicados anteriormente para la medición del volumen electromigrado utilizan SEM, microscopía electrónica de transmisión (TEM) o microtomografía de rayos X (X)3,4,6,7,8,9.
El uso de estos instrumentos implica una preparación delicada de las muestras, como la aplicación de una película metálica delgada adicional en superficies que tienen una alta resistividad para reducir la acumulación de cargas en la superficie durante el escaneo por haz de electrones.
La capa adicional en la superficie puede causar problemas, como cambiar el comportamiento de electromigración modificando la tensión mecánica en la interfaz. La acumulación de carga, por otro lado, puede causar una deriva virtual de la muestra durante un escaneo, lo que hace que los datos sean inútiles.
El funcionamiento de SEM, TEM también requiere más tiempo y es más caro que el uso de un microscopio de escaneo láser. El uso del microscopio de barrido láser facilita la investigación de las líneas bajo prueba a temperaturas más altas. Para los SEM, también existen algunas etapas de calentamiento que no están disponibles para todos los SEM, son costosas y, a menudo, se hacen a medida.
Con un microscopio de barrido láser, la incertidumbre de medición de los volúmenes puede estar en el mismo rango que para los SEM, siempre que se utilice el equipo adecuado y se tenga un cuidado meticuloso de las condiciones de medición.
Durante el escaneo de la superficie, se miden múltiples valores para cada punto, lo que da como resultado una alta resolución. Debido al principio de escaneo del microscopio de escaneo láser, el límite del método no es igual al límite de difracción. Esto permite la medición de estructuras de un tamaño lateral de aproximadamente 120 nm.
En comparación con las mediciones SEM, la altura de las estructuras se puede medir de manera más fácil y precisa con mucho menos esfuerzo. La determinación de la altura con un SEM puede emplear la medición de la altura de varias intersecciones después de prepararlas con un haz de iones enfocado (FIB). El FIB puede causar abrasión en las proximidades. Debido a estas preparaciones, es posible que el volumen de un vacío o montículo no esté representado adecuadamente por las mediciones SEM, lo que resulta en que las mediciones de volumen de ambos métodos tengan una precisión similar.
Dado que opera en condiciones de aire ambiente, es posible operar más rápido, más barato y más versátil que usando SEM o TEM.
El método descrito aquí se puede utilizar si se puede evitar la oxidación del material durante la medición. La oxidación puede ocurrir a temperaturas elevadas debido al autocalentamiento de las líneas bajo prueba. De lo contrario, utilizando un SEM o escaneando la línea bajo las pruebas, se recomienda primero la geometría de la región de interés, luego aplicando la tensión de electromigración en una cámara evacuada y finalmente escaneando la línea bajo las pruebas la geometría de la región de interés por segunda vez.
Si la muestra se mueve para estresar en un entorno diferente, se debe tener cuidado de alinear la muestra antes y después de estresar en la misma dirección. La alineación elimina la necesidad de corregir las imágenes escaneadas para girarlas. Por lo general, esto da resultados más precisos que la corrección del giro por software.
Este método utiliza muestras preparadas e incluye los escaneos láser iniciales, estresando las muestras en condiciones predeterminadas y realizando segundos escaneos láser de las mismas regiones. A partir de estos escaneos, los volúmenes electromigrados de varias muestras se determinan mediante la sustracción de los dos escaneos láser. Utilizando los datos de volumen de varias muestras, se determina la intercepción de la línea de mejor ajuste para diferentes longitudes. Esta intercepción es la longitud de Blech en las condiciones utilizadas en el experimento. El método tiene ventajas cuando se investiga un material conductor de electricidad con una alta resistividad o un material afectado negativamente por la preparación de la muestra necesaria para los otros métodos.
Las geometrías de las líneas sometidas a ensayo para los ensayos de electromigración varían ampliamente en función de la técnica de medición utilizada. El uso de un microscopio láser de barrido no se limita a líneas individuales bajo prueba con anchos de varios μm10 , sino que se puede utilizar para todas las estructuras en las que se investigan los cambios de volumen causados por la electromigración, como las estructuras de Blech.
Protocolo
1. Elección del material y fabricación de líneas bajo prueba del material de interés
- Elija las líneas bajo prueba del material de interés y ensamble estas para obtener acceso a la región de interés de la línea bajo prueba con el microscopio de escaneo láser.
NOTA: Las líneas bajo prueba pueden tener geometrías utilizadas en semiconductores de vanguardia o pueden ser más grandes y solo se usan para la evaluación de fenómenos de electromigración. Las geometrías de línea pueden ser, entre otras, anchos de 20-50 μm, espesores de 10 nm hasta 200 nm y longitudes de 40 μm hasta 800 μm. La región de interés depende de los materiales utilizados y de la geometría de la estructura de ensayo, que debe determinarse escaneando toda la estructura de ensayo durante los primeros experimentos utilizando condiciones de tensión fuertes. Todas las partes de la estructura de prueba que muestran cambios en el volumen se pueden utilizar como región de interés. - Utilice líneas encapsuladas o no encapsuladas bajo prueba hechas del mismo material que tenga la misma sección transversal (misma altura y ancho) con diferentes longitudes. Estresarlos utilizando las mismas condiciones (densidad de corriente, temperatura, atmósfera, tiempo) para determinar la longitud crítica para el inicio de la electromigración.
- Alternativamente, use líneas bajo prueba con la misma longitud y varíe la densidad de corriente en un rango pequeño mientras estresa con la misma temperatura en la misma atmósfera.
2. Determinación del volumen electromigrado
- Determine el volumen electromigrado para diferentes longitudes (múltiples puntos de datos) o diferentes densidades de corriente de acuerdo con los pasos posteriores del protocolo, que describen en detalle cómo obtener un solo punto de datos.
NOTA: Con el método incluido en esta publicación, cada muestra se utiliza para obtener un punto de datos. - Obtener un punto de datos
- Utilice un microscopio de barrido láser con la resolución más alta disponible.
NOTA: No todos los microscopios de barrido láser alcanzan la resolución necesaria para el método incluido en este protocolo. - Encienda el microscopio de barrido láser y abra el software de medición y análisis. Si el software de medición pregunta: ¿Volver al origen de la etapa XY? haga clic en No.
- Obtenga las muestras y un soporte de muestra adecuado para poder fijar la muestra en la platina del microscopio de escaneo láser para que la muestra no se mueva durante el proceso de escaneo.
- Obtenga una fuente de corriente y cables precisos para la conexión eléctrica. Asegúrese de que la fuente de corriente y los cables funcionen correctamente.
- Cambie la altura de la platina del microscopio de barrido láser y coloque la muestra en el portamuestras debajo del microscopio de barrido láser. Alinee la muestra paralelamente a la mesa del microscopio. Fije la muestra para que no se mueva durante las mediciones.
NOTA: Es posible pausar el experimento en este punto. A veces, el comportamiento de las muestras cambia en función de las condiciones de almacenamiento, por ejemplo, debido a la oxidación. Las pausas son opcionales y deben evitarse si se espera que las muestras cambien mucho con las condiciones en las que se encuentran para estas mediciones. - Conecte la toma de corriente de la fuente de corriente a la muestra o al portamuestras, según la configuración. Compruebe si los cables de unión todavía están unidos a la muestra, ya sea utilizando una corriente baja durante un corto período de tiempo o mediante una inspección óptica.
NOTA: Es posible pausar el experimento en este punto. - Ajuste la diferencia de altura entre la lente del objetivo del microscopio de barrido láser y la muestra para enfocar la muestra. Enfoca la región de interés de la lente del objetivo con el aumento más bajo. Ya sea manualmente o en la ventana Observar del software de medición haciendo clic en Enfoque automático.
NOTA: Si es necesario, mueva la posición XY de la tabla para poder ver la región de interés. Es posible pausar el experimento en este punto. - Cambie la lente del objetivo a la siguiente ampliación más alta y enfoque la región de interés. Ya sea manualmente o en la ventana Observar del software haciendo clic en Enfoque automático.
NOTA: Es posible pausar el experimento en este punto. - Repita el cambio de la lente del objetivo y el enfoque hasta que la región de interés enfocada sea visible utilizando la lente del objetivo con el aumento más alto, por ejemplo, 150x en la ventana Observar .
NOTA: Si la región de interés es más grande que la región que se puede escanear con los ajustes más precisos del microscopio de barrido láser, utilice la sutura. El protocolo no incluye explicaciones de cómo proceder con la costura. Es posible pausar el experimento en este punto. - Asegúrese de que Herramientas > Medir > Recuento promedio esté establecido en 4. Haga clic en Opciones > Guardar automáticamente, elija una carpeta de destino de guardado, un prefijo de nombre de archivo y un ejemplo de nombre de archivo y haga clic en Aceptar.
- Vaya a la ventana Medir . Seleccione el modo experto. Utilice la configuración de medición > Perfil de superficie > Súper fino (2048 x 1536) > Alta precisión.
NOTA: Los nombres de los ajustes para obtener la máxima precisión pueden ser diferentes si se utiliza otro microscopio de barrido láser. - Aumente la distancia entre la lente del objetivo y la muestra haciendo clic en las flechas hacia arriba hasta que toda la ventana muestre que la superficie está en negro. Haga clic en Establecer pos superior. Disminuya la distancia entre la lente del objetivo y la muestra haciendo clic en las flechas hacia abajo hasta que toda la superficie sea visible, y continúe haciendo clic en las flechas hacia abajo hasta que toda la ventana que muestra la superficie esté en negro. Haga clic en Establecer pos inferiores.
- Haga clic en Ganancia automática e Iniciar medición para comenzar a escanear la superficie de la región de interés.
NOTA: En el primer experimento utilizando un material y una configuración, es necesario escanear no solo la región de interés, sino toda la superficie de la línea bajo prueba desde un contacto eléctrico (por ejemplo, cable de unión) al otro contacto (cable de unión) de la muestra hasta la primera parte que solo se usa para la conexión de la muestra al entorno para poder determinar de dónde provienen los átomos que componen el nuevo volumen como Pueden ser de una parte diferente de la muestra y descartar diferentes efectos como la termomigración que hace que aparezca el volumen. Es posible pausar el experimento en este punto. - Desenfoque el microscopio de barrido láser aumentando la distancia entre el objetivo y la muestra en varios mm hasta 1 cm haciendo clic en las flechas hacia arriba varias veces antes de estresar la muestra.
NOTA: Esto es para evitar dañar la lente del objetivo. Dependiendo del material de la línea bajo prueba y las condiciones de tensión, la línea bajo prueba se calentará. En algunos casos, la temperatura alcanzará varios cientos de grados centígrados. La distancia entre la lente del objetivo y la muestra suele ser inferior a 2 mm durante el escaneo láser. La lente del objetivo se calentaría considerablemente durante los experimentos si la distancia no se incrementa durante el estrés. El calentamiento de la lente del objetivo provoca una tensión mecánica en la lente que podría provocar la deformación de la lente u otros daños en la lente. - Estresar la muestra con las condiciones predeterminadas (densidad de corriente, tiempo). Detenga el flujo de corriente después del tiempo predeterminado.
NOTA: Las condiciones incluyen la densidad de corriente, el tiempo de tensión, la temperatura y la longitud de la línea bajo prueba. Las condiciones de tensión dependen del material de interés. Es posible pausar el experimento en este punto. - Espere de 3 a 5 minutos después de la tensión actual. Enfoque el microscopio de barrido láser en la región de interés después de que la muestra se enfríe a temperatura ambiente (RT).
NOTA: Es posible pausar el experimento en este punto. - Vuelva a enfocar hasta que la muestra se detenga para desenfocarse por sí sola para asegurarse de que no haya desviaciones en la superficie medida debido a los cambios de temperatura.
NOTA: Es posible pausar el experimento en este punto. - Escanee la misma área que se ha escaneado antes del esfuerzo actual con los mismos ajustes de acuerdo con los pasos 2.2.10-2.2.13.
NOTA: Es posible pausar el experimento en este punto. - Utilice el software de análisis y corrija las dos imágenes de la región de interés.
- Abra el archivo en el software de análisis si no está abierto haciendo clic en Archivo > Abrir y buscando el archivo correcto.
- Corrija la inclinación de las muestras haciendo clic en Procesar imagen> Inclinación correcta para abrir una ventana para la corrección de la inclinación. Utilice la imagen de visualización Láser+Óptico y el método de corrección Inclinación del plano (3 puntos) para hacer que aparezcan tres puntos en la imagen mostrada.
- Mueva las líneas de manera que la mayor parte de cada una de estas líneas esté en el fondo. Mueva los tres puntos cerca de la región de interés. Mueva estos puntos para que coincidan con el plano, que está representado por dos líneas rectas en las secciones transversales, al fondo.
NOTA: Si el fondo no está representado correctamente por un plano, haga coincidir el plano con los bordes inferiores de la región de interés. - Elija No ajustar la altura de desplazamiento 0 datos y Ajustar automáticamente el rango de altura y haga clic en Ejecutar y cerrar.
- Elimine las alturas causadas por la sobrecarga del microscopio de escaneo láser haciendo clic en Imagen de proceso > Nivel de corte de altura para abrir la ventana de corte de altura. Establezca el nivel de corte en Normal, utilice los datos de Cumplir siempre con la altura 0 y haga clic en Aceptar.
NOTA: Es posible pausar el experimento en este punto. - Recorte la imagen si es más grande que la región de interés y es demasiado grande para ser evaluada con el software destinado a la evaluación. Recorte la imagen para que la región de interés esté en el centro, por ejemplo, 500 píxeles x 500 píxeles.
- Para recortar, haga clic en Procesar imagen > Recorte para abrir la ventana de recorte. Elija la anchura y la altura según la región de interés y mueva el rectángulo de selección para incluir la región de interés.
NOTA: Lo ideal sería no tener que corregir las imágenes en absoluto alineando las muestras perfectamente para que no tengan inclinación con respecto a la etapa de muestra y solo escaneando una porción de la muestra un poco más grande que la región de interés. Es posible que este tipo ideal de medición no sea posible con el equipo disponible.
- Guarde la imagen recortada corregida. Abra la imagen corregida y recortada con el software de análisis haciendo clic en Archivo > Abrir y eligiendo el archivo correcto.
- Para exportar los datos de forma que se mantenga la información 3D sobre la región de interés, por ejemplo, como un archivo ASC, siga estos pasos. Haga clic en Archivo > datos CAD 3D de salida para abrir la ventana para seleccionar los parámetros de salida.
- Utilice la cantidad de omisión 1 (sin omisión) > la precisión de visualización del número real 10 > la relación de zoom XY x1 y la altura de mejora (%) 100 y elija Superficie o utilice las opciones con la mayor precisión disponible. Haga clic en Establecer. Utilice los datos del grupo de puntos para guardar los datos etiquetados de forma única. Después de terminar de exportar los datos, el programa mostrará una ventana.
- Utilice nombres únicos para que coincidan con los datos de la medición antes y después de la tensión actual para cada región de interés.
NOTA: Es posible pausar el experimento en este punto.
- Transfiera los datos al software de evaluación.
NOTA: Algunos microscopios de escaneo láser tienen software con funciones integradas para medir volúmenes. Si este es el caso, es una opción usar el software incorporado en lugar de usar el software descrito en este protocolo. - Utilice una versión del software de evaluación mencionado en la Tabla de Materiales y los paquetes mencionados en la Tabla de Materiales y abra el programa (Archivo de codificación suplementaria 1: Laserscan_1.vi).
NOTA: Es posible que se utilice otro software para obtener los mismos resultados. - Haga clic en la flecha para iniciar la ejecución del programa. Abra la ruta de guardado de los archivos asc destinados a su uso haciendo clic en Abrir. Cargue los archivos asc en el programa eligiendo el nombre de la muestra en la lista de selección. Asegúrese de que el área esté seleccionada y haga clic en la cruz y el área.
NOTA: Si la electromigración se produce durante mucho tiempo o el efecto de la electromigración es fuerte en la muestra con las condiciones elegidas, es posible que el programa no pueda coincidir con los patrones de las imágenes. Si esto sucede, vuelva a realizar una medición similar con una nueva muestra a densidades de corriente más bajas, tiempos de prueba más cortos o temperatura más baja y ajuste los experimentos futuros en consecuencia. - Ajuste la coincidencia de patrones manualmente si el programa no coincide perfectamente con los patrones.
- Para añadir la escala de la altura, utilice el ratón para elegir un rectángulo que pertenezca a la superficie del sustrato. Observe los dos histogramas de las alturas del rectángulo en la imagen antes y después de la tensión actual junto a la imagen de la región de interés. Haz que la forma de estos dos histogramas se vea distribuida normalmente y lo más similar posible.
NOTA: Si los histogramas se ven muy diferentes, rehaga el rectángulo elegido y varíe el rectángulo ligeramente hasta que esté satisfecho con la forma del histograma. - Haga clic en el botón cero etiquetado como fondo para guardar esta altura como fondo.
- Elija otro rectángulo en una parte plana en la parte superior de la línea que se está probando.
NOTA: Si la región elegida con este rectángulo cambió durante el experimento, rehaga el rectángulo hasta que se haya elegido una región sin cambios. Si la región se vuelve demasiado pequeña, por ejemplo, solo unos pocos píxeles, la determinación de la altura no será precisa. Si solo hay una región muy pequeña que no cambió, use una imagen con más píxeles para obtener una región sin cambios que esté en la parte superior de la línea bajo prueba. - Observe los dos histogramas junto a la imagen de la superficie de la región de interés. Haz que la forma de estos dos histogramas se vea distribuida normalmente y lo más similar posible.
NOTA: Rehacer haciendo rectángulos que se ajusten a todos los criterios y que además den un buen resultado en el histograma. - Guarde este valor haciendo clic en la línea debajo de prueba y haga clic en Aceptar.
NOTA: Estos datos solo se guardan temporalmente por ahora. - Detenga el programa haciendo clic en el botón rojo de parada y guarde los parámetros de altura de forma permanente en el programa haciendo clic en Editar > Hacer que los valores actuales sean predeterminados y Archivo > Guardar.
NOTA: El programa toma el fondo como una altura de cero y la altura de la línea bajo prueba como 1. Esto se multiplicará por la altura medida de la línea bajo prueba en pasos posteriores / al final. - Haga clic en la flecha para iniciar la ejecución del programa. Evalúe un solo montículo (o vacío) en la región de interés dibujando un rectángulo con el botón izquierdo del ratón cerca del borde del montículo (o vacío) en el IMG en comparación con el panel frontal.
- Acércate lo más posible al borde de la estructura. Mejore el área seleccionada utilizando la versión ampliada de la estructura y haga zoom en la imagen, por ejemplo, la que está etiquetada como recorte relajante.
- Ajuste la región de montículo (o vacío) seleccionada hasta que el contenido coincida con el borde del rectángulo con el montículo (o vacío).
- Haga clic en el botón Guardar junto a la comparación IMG para guardar la suma de todos los píxeles (enteros) del volumen.
NOTA: Es posible pausar el experimento en este punto. - Continúe con el siguiente montículo o vacío de la imagen. Siga los pasos 2.2.31 a 2.2.34 para cada montículo (o vacío) presente en la imagen.
NOTA: Es posible pausar el experimento después de guardar la integral de cada montículo (o vacío). - Utilice los datos de volumen y calcule la suma de los volúmenes de los montículos (o vacíos) para obtener el volumen del material electromigrado en una región de interés en estas condiciones.
- Convierta el volumen sumado determinado (las unidades son píxel x píxel x altura) en el metro cúbico (m³) multiplicando por el tamaño correspondiente a un píxel en metro y el factor de la altura de la línea bajo prueba, incluida la altura de la capa de encapsulación.
NOTA: En este trabajo, cada píxel mide 0,05 μm x 0,05 μm. La altura de la línea bajo prueba, incluida la altura de la capa de encapsulación para la conversión en metros cúbicos, se puede medir con cualquier técnica de medición adecuada. - Guarde el volumen y las condiciones de medición (longitud de la línea bajo prueba, densidad de corriente, temperatura, tiempo de tensión de corriente) como un punto de datos.
NOTA: Es posible pausar el experimento en este punto.
- Utilice un microscopio de barrido láser con la resolución más alta disponible.
- Obtenga más puntos de datos siguiendo el paso 2.2. Para líneas bajo prueba con longitudes diferentes de las longitudes utilizadas anteriormente hasta que existan al menos tres puntos de datos con el volumen electromigrado diferente de cero. Alternativamente, obtenga más puntos de datos siguiendo el paso 2.2 para líneas con la misma longitud y variando ligeramente la densidad de corriente.
- Para obtener la longitud crítica para el material de interés y las condiciones de medición, haga un gráfico con al menos tres puntos de datos, que no estén ubicados ni en el eje x ni en el eje y, con el volumen electromigrado en el eje y y la longitud o la densidad de corriente utilizando el parámetro con valores variados en el eje x.
- Determine la línea de mejor ajuste para los datos con la línea de mejor ajuste que tenga menos de dos puntos de intersección con el eje x. Obtenga la intersección de la línea lineal de mejor ajuste para puntos de datos con volúmenes pequeños con el eje x. Esta intersección es l o j de (Ij)c y (Ij)c calculada multiplicando el valor de la intercepción por la densidad o longitud actual utilizada en el experimento, respectivamente.
NOTA: Dependiendo de las condiciones de tensión, las longitudes y el material investigado, la línea de mejor ajuste puede ser lineal cerca de la intercepción o exponencial si las condiciones de tensión, como la densidad o la longitud actuales, son mayores.
Resultados
La Figura 1 muestra el esquema de la geometría de una estructura de prueba, y la Figura 2 muestra el esquema del flujo de trabajo de las mediciones necesarias para obtener un punto de datos. Para investigar la influencia de la longitud y la existencia y el valor numérico de la longitud de la línea bajo prueba necesaria para el inicio de la electromigración, se utilizó el protocolo antes mencionado para obtener datos para múltiples líneas bajo prueba con diferentes longitudes (por ejemplo, 120 μm, 540 μm y 680 μm) hechas de disiliciuro de molibdeno y encapsuladas por una capa de óxido de silicio a alta temperatura. Todas las líneas bajo prueba se fabricaron de la misma manera y se sometieron a tensiones durante el mismo tiempo de 7 min en condiciones de aire ambiente a temperatura ambiente (23 °C) con una corriente constante sin estrechamiento de la línea bajo prueba durante el esfuerzo, lo que resultó en una densidad de corriente constante de 2,26 ×10 10 A/m2, 3,25 × 1010 A/m2 o 3,44 × 1010 A /m2.
En las estructuras de prueba utilizadas (líneas de MoSi2 encapsuladas) solo la región de contacto de MoSi2 con el aluminio mostró cambios en el volumen. Los experimentos anteriores no mostraron protuberancias de ningún tipo a través de la encapsulación.
Los tamaños laterales de todos los montículos evaluados con este método estuvieron por encima del tamaño de 200 nm, muy por encima de la resolución lateral del microscopio láser de barrido.
V = const.lwh
La incertidumbre máxima del volumen medido se puede estimar mediante la ley de propagación de la covarianza.

siendo l la longitud, w la anchura y h la altura. Con las incertidumbres de medición de las dimensiones individuales Δl = 50 nm, Δw = 50 nm y Δh = 12 nm. Las incertidumbres de la longitud y el ancho se toman como las dimensiones de un píxel. La incertidumbre de la altura de Δh = 12 nm se ha medido mediante SEM en el montículo más pequeño detectable mediante microscopio de barrido láser y está de acuerdo con la incertidumbre declarada por el fabricante.
La altura de los montículos (como se muestra en la Figura 3) suele estar en el rango de 190 nm. Los montículos más pequeños detectables correctamente tienen alturas en el rango de 34 nm. Las longitudes y anchuras suelen estar en el rango de 1 μm para la mayoría de los montículos, como se muestra en la Figura 3.
Esto hace que la incertidumbre para un solo montículo con un tamaño de montículo típico sea
 = 16%
= 16%
y para que un pequeño montículo sea
 = 45%.
= 45%.
Con el método que se muestra en este protocolo, se suma el volumen de varios montículos. Los valores típicos para la cantidad de montículos sumados en una muestra son aproximadamente 9, como se muestra en la Figura 3.
Esto hace que la incertidumbre sea:

Si en la muestra solo hay montículos de tamaño medio
y

si todos los montículos presentes en la muestra son extremadamente pequeños.
En realidad, los montículos pequeños y de tamaño típico están presentes en las muestras, y la cantidad de montículos varía ligeramente entre las muestras, lo que hace que la incertidumbre esté entre el 5% y el 15% dependiendo de los tamaños y números exactos de los montículos.
Como se puede observar en los resultados representativos mostrados en este trabajo, el valor del volumen electromigrado aumenta con el aumento de la longitud de la línea bajo prueba. El volumen electromigrado también aumenta si se utilizan condiciones de tensión más fuertes, por ejemplo, valores más altos de densidad de corriente.
Si todos los datos de volumen, independientemente de la longitud de la línea bajo prueba, son cero, se necesitan condiciones de tensión más fuertes (por ejemplo, temperaturas más altas, tiempo de tensión más largo, densidades de corriente más altas o una combinación de estas) para el inicio de la electromigración. En otros experimentos se utilizarán condiciones de tensión más fuertes.
La Figura 3 muestra una región de interés antes de la tensión de corriente en el lado izquierdo y después de la tensión de corriente en el medio. En el lado derecho de la Figura 3 se destacan los montículos después de la tensión actual. En la Figura 3 se muestran los nuevos montículos que se han formado y el crecimiento de protuberancias que han estado presentes antes del esfuerzo actual.
La Figura 4 muestra los resultados exitosos del aumento del volumen electromigrado con el aumento de la longitud, incluyendo una línea exponencial de mejor ajuste, incluyendo todos los puntos de datos. La Figura 4 también muestra los resultados de las longitudes más cortas que se utilizan para determinar la intercepción de la línea lineal de mejor ajuste con el eje x.
La Figura 5 muestra datos exitosos del volumen electromigrado aumentando con un aumento de la densidad de corriente con la longitud manteniéndose constante en 120 μm y la densidad de corriente variada en el rango en que se observó el inicio de la electromigración en experimentos anteriores. La Figura 5 también muestra la influencia del óxido de silicio encapsulante a alta temperatura. Dos espesores diferentes de óxido de silicio a alta temperatura (círculos rellenos: 60 nm, círculos sin relleno: 20 nm) dan como resultado dos valores diferentes para el inicio de la electromigración con respecto a la densidad de corriente. Esto es causado por la tensión mecánica de las capas de encapsulación.
La Figura 6 muestra datos que podrían ser adecuados para obtener una primera estimación de los parámetros de electromigración en el material. Para obtener mejores resultados, se deben adquirir más datos con longitudes en el rango de 150 μm a 500 μm.
La Figura 7 muestra datos subóptimos, que requerirían pruebas de líneas bajo prueba con longitudes comprendidas entre 120 μm y 260 μm, ya que podría haber longitudes superiores a 120 μm que también tengan un volumen electromigrado de 0. Si hay una disminución del volumen con un aumento de la longitud de la estructura de la prueba, algunos de los datos son incorrectos. Lo más probable es que se deba a errores en la evaluación del volumen, como errores en la determinación de la escala de altura o errores en la búsqueda del borde de los montículos. Si este es el caso, echar otro vistazo a la evaluación de la imagen respectiva y reevaluarla puede ser útil para llegar al fondo del problema.
Los datos incorrectos también pueden deberse a que no se permite que la estructura de la prueba se enfríe a temperatura ambiente para la segunda exploración. Volver a escanear la misma área y usar el nuevo escaneo para la evaluación es la única opción para abordar el problema. Si este problema persiste después de volver a evaluar y rehacer el escaneo, es probable que no se deba a un error en la evaluación y podría ser un efecto real del material utilizado.
Para longitudes ligeramente por encima de la longitud crítica, la línea de mejor ajuste se puede aproximar mediante una línea recta. Si la longitud de las líneas bajo prueba se alarga, la naturaleza exponencial de la línea de mejor ajuste se hace visible.
La intercepción con el eje x se determinó a 33,33 μm para tensión con una densidad de corriente de 3,25 × 1010 A/m2 , lo que resultó en (Ij)c = 1,08 × 106 A/m.
A partir de los datos de la Figura 5 , se determinó la intercepción a 3.49 ×10 10 A/m2 y 3.6 ×10 10 A/m2. Con una longitud de la línea sometida a prueba de 120 μm, se obtienen valores de 4,19 × 106 A/m y 4,2 ×10 10 A/m.
La discrepancia del producto crítico medido surge de un mayor autocalentamiento de las líneas bajo prueba con un aumento en la densidad de corriente. La temperatura de las líneas bajo prueba generalmente aumenta con el aumento de la densidad de corriente. Las temperaturas de las líneas sometidas a prueba con una longitud de 120 μm sometidas a tensión durante 7 min se determinaron mediante la medición de la resistividad eléctrica para densidades de corriente de 2,65 ×10 10 A/m2, 3,24 × 1010 A/m2, 3,53 × 1010 A/m2 y 3,85 ×10 10 A/m2 a 158 °C, 202 °C, 257 °C y 320 °C, respectivamente. Se ha demostrado anteriormente una dependencia del producto crítico de la temperatura y otros factores11.
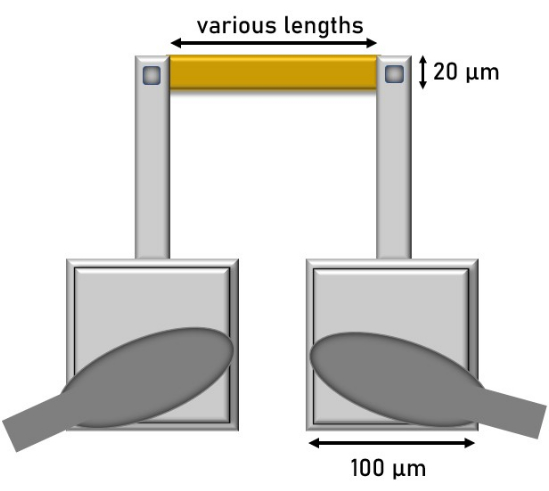
Figura 1: Esquema de la geometría de una estructura de prueba adecuada para investigaciones de parámetros de electromigración a través de un microscopio de barrido láser. La caja dorada es la línea bajo prueba (en este trabajo hecho de MoSi2), las cajas plateadas son los suministros eléctricos (en este trabajo hechos de aluminio) y las almohadillas de contacto se muestran como pilas de las cajas plateadas en la región de los cables de unión (gris oscuro). Las pilas indican que las almohadillas de contacto tienen un espesor de capa mayor que los suministros eléctricos. Las pequeñas cajas plateadas a ambos lados de la línea bajo prueba son las regiones de contacto eléctrico del suministro eléctrico y la línea bajo prueba. Se supone que el borde oscuro simboliza que esta región tiene una elevación más baja debido a que la capa de encapsulación se abre en esta parte para permitir el contacto eléctrico. Haga clic aquí para ver una versión más grande de esta figura.

Figura 2: Esquema del flujo de trabajo de las mediciones necesarias para obtener un punto de datos. Haga clic aquí para ver una versión más grande de esta figura.
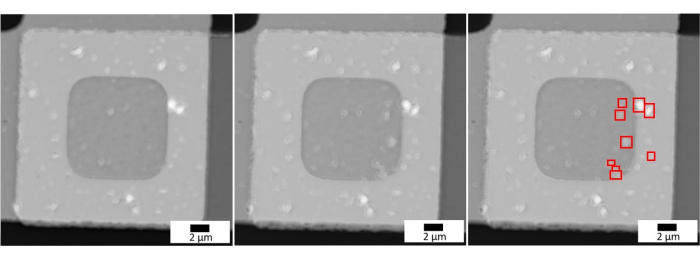
Figura 3: Comparación de la región de interés antes y después del estrés actual. Comparación de la región de interés (en este trabajo, el contacto eléctrico del aluminio con la línea bajo prueba) antes del esfuerzo de corriente (lado izquierdo) y después del esfuerzo de corriente (centro) con los montículos causados por electromigración resaltados en el lado derecho. Haga clic aquí para ver una versión más grande de esta figura.

Figura 4: Resultados exitosos del volumen electromigrado de las regiones de contacto del lado del cátodo en función de la longitud de la línea bajo prueba para las líneas MoSi2 . Datos representativos (resultados satisfactorios) del volumen electromigrado de las regiones de contacto del lado del cátodo en función de la longitud de la línea sometida a prueba para líneas de MoSi2 encapsuladas con óxido de silicio de alta temperatura de 60 nm, tensión en condiciones de aire ambiente durante 7 min con una densidad de corriente de 3,25 × 1010 A /m 2. Haga clic aquí para ver una versión más grande de esta figura.
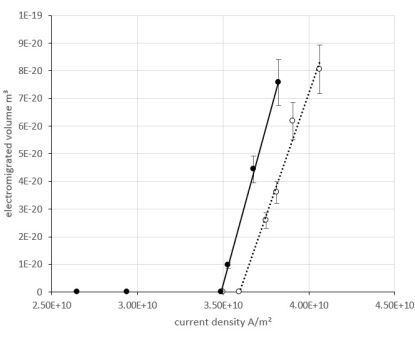
Figura 5: Resultados exitosos del volumen electromigrado de las regiones de contacto del lado del cátodo en función de la densidad de corriente para las líneas encapsuladas bajo prueba hechas de MoSi2. Datos representativos (resultados exitosos) del volumen electromigrado de las regiones de contacto del lado del cátodo en función de la densidad de corriente para las líneas encapsuladas bajo prueba hechas de MoSi2 mientras se estresan en condiciones de aire ambiente durante 7 min. Los círculos rellenos muestran los datos de las líneas MoSi2 bajo prueba encapsuladas con óxido de silicio de alta temperatura de 60 nm. Los círculos sin relleno muestran los datos de las líneas de MoSi2 bajo prueba encapsuladas con óxido de silicio de alta temperatura de 20 nm. Haga clic aquí para ver una versión más grande de esta figura.

Figura 6: Datos válidos. Datos representativos (los datos pueden usarse) del volumen electromigrado de las regiones de contacto del lado del cátodo en función de la longitud de la línea bajo prueba para líneas de MoSi2 encapsuladas con óxido de silicio de alta temperatura de 60 nm, tensión en condiciones de aire ambiente durante 7 min con una densidad de corriente de 2,56 ×10 10 A /m 2. Haga clic aquí para ver una versión más grande de esta figura.

Figura 7: Datos subóptimos. Datos representativos (datos subóptimos) del volumen electromigrado de las regiones de contacto del lado del cátodo en función de la longitud de la línea sometida a ensayo para líneas de MoSi2 encapsuladas con óxido de silicio a alta temperatura de 20 nm, sometidas a tensión en condiciones de aire ambiente durante 7 minutos con una densidad de corriente de 3,44 ×10 10 A/m2. Haga clic aquí para ver una versión más grande de esta figura.
Fichero de codificación suplementaria 1: Laserscan_1.vi. Haga clic aquí para descargar este archivo.
Discusión
El protocolo descrito aquí se puede utilizar para obtener datos de forma robusta y reproducible sobre el volumen electromigrado de materiales conductores de electricidad. Los materiales y el equipo disponible deben cumplir con ciertos criterios, como se mencionó anteriormente en los pasos del protocolo o en las "NOTAS" para poder utilizar este método para la evaluación de la electromigración.
Las partes críticas del protocolo son asegurarse de que la muestra se enfríe a temperatura ambiente para la medición después del estrés actual. Si no se enfría a temperatura ambiente, se introducirán errores en la superficie de escaneo debido al cambio de temperatura durante la exploración y se obtendrá una superficie determinada defectuosa y, por lo tanto, una determinación defectuosa del volumen.
Otra parte importante es la elección del fondo y la altura adecuados de la línea bajo prueba para determinar el factor de altura en el programa de evaluación. Si esto se hace incorrectamente, el volumen será incorrecto. Otras partes críticas son la medición de al menos tres muestras que den valores para el volumen que sean diferentes de cero.
Si los datos para el escaneo después del esfuerzo actual no se ven bien y no se han notado antes de realizar la evaluación, es posible escanear nuevamente usando los mismos parámetros que para el primer escaneo. Si esto es necesario, asegúrese de poder evitar voltear la muestra, ya sea alineándola bajo el microscopio de escaneo láser de la misma manera que antes o corrigiéndolo mediante un software. Para otros métodos de solución de problemas, eche un vistazo a las notas.
Las modificaciones del método implican el uso de una etapa de calentamiento para la muestra similar a otros métodos experimentales que emplean una etapa de calentamiento11, sacando la muestra del portamuestras para someterla a diferentes condiciones, como temperaturas elevadas en un horno u otros medios circundantes (líquidos o gases), lo que no se puede hacer mientras la muestra está bajo el microscopio de escaneo láser.
Las mediciones en diferentes condiciones, por ejemplo, temperaturas, permiten el uso de este método de determinación del volumen que se utilizará para calcular otros parámetros de electromigración, como la carga iónica efectiva o la energía de activación. Los cálculos de la carga iónica efectiva utilizan el volumen electromigrado como punto de partida. Los medios de determinación del volumen no son importantes para el cálculo. Los cálculos se realizan de la misma manera que para determinar la carga efectiva de iones mediante el uso de volúmenes electromigrados medidos mediante SEM 2,3,4.
Como se indicó en las ecuaciones anteriores, el volumen electromigrado depende de la difusión. La difusión depende exponencialmente de la energía de activación del proceso particular12. Esto permite el uso de un diagrama de Arrhenius de más para obtener la energía de activación de la pendiente lineal. El método también se puede utilizar para determinar los cambios de volumen en las estructuras de Blech y para calcular la velocidad de deriva de la misma manera que se muestra para los volúmenes determinados mediante SEM11.
Este método solo se puede utilizar si los montículos o vacíos son accesibles para el escaneo láser de la superficie. Esto hace que el método no sea adecuado para evaluar el cambio de volumen causado por los vacíos sumergidos. El microscopio de barrido láser es menos sensible a los cambios de volumen que los cambios más pequeños, ya que se pueden detectar mediante SEM y TEM. Si el volumen electromigrado es demasiado pequeño, el uso de un microscopio de barrido láser no dará ningún resultado útil.
En comparación con las investigaciones que utilizan SEM o TEM, es más fácil incluir una etapa de calentamiento en la configuración del microscopio de escaneo láser porque normalmente tienen que ser hechas a medida 7,11,13,14.
Divulgaciones
Los autores no tienen nada que revelar.
Agradecimientos
Esta investigación fue financiada por el "Ministerio Federal de Economía y Acción Climática de Alemania" en el proyecto "EMIR" código de financiación 49MF190017.
Materiales
| Name | Company | Catalog Number | Comments |
| Current source/2602B System Source Meter | Keithley | 2602B | Any type of current source can be used. |
| JKI VI Package Manager | NI | 781838-35 | https://www.ni.com/de-de/shop/product/jki-vi-package-manager.html? srsltid=AfmBOorzYPY4B8 hlGIUIYl3PJoBwb8o8PeV MsBfM9YcFasnBIhEWwBpd |
| Labview 2024 Q1 Full | NI | 784522-35 | Evaluation software option (https://www.ni.com/de-de/shop/product/labview.html?partNumber=784522-35) |
| Labview 2024 Q1 Pro | NI | 784584-35 | Evaluation software option (https://www.ni.com/de-de/shop/product/labview.html?partNumber=784522-35) |
| Laser scanning micrsoscope VK-X200 series | Keyence | VK-X200 no longer available for purchase. Available option VK-X3100. Laser scanning microscope with wavelength of 408 nm. | |
| NI Vision Development Module | NI | 788427-35 | https://www.ni.com/de-de/shop/product/vision-development-module.html?srsltid=AfmBOoq2S8kYVmV1CK6 xSovMHTELtQHE2neD oM2RrEnibd2AuyzkWvuS |
| Objective lens, CF Plan Apo 150x/ 0.95; ∞/0 EPI; OFN25 WD 0.2 | Nikon | BZ10123016 | https://spwindustrial.com/nikon-cf-plan-apo-150x-0-95-0-wd-0-2mm-epi-objective/ |
| VK Analyse-Modul Version 3.3.0.0 | Keyence | Analytics software supported by the laser scanning microscope. No longer available for purchase. New laser scanning microscope uses newer software. | |
| VK Viewer Version 2.2.0.0 | Keyence | Measurement software supported by the laser scanning microscope. No longer available for purchase. New laser scanning microscope uses newer software. |
Referencias
- Somaiah, N., Kumar, P. Inverse blech length phenomenon in thin-film stripes. Phys Rev Appl. 10 (5), 054052 (2018).
- Huynh, Q. T., Liu, C. Y., Chen, C., Tu, K. N. Electromigration in eutectic SnPb solder lines. J Appl Phys. 89 (8), 4332-4335 (2001).
- Lee, T. Y., Tu, K. N., Kuo, S. M., Frear, D. R. Electromigration of eutectic SnPb solder interconnects for flip chip technology. J Appl Phys. 89 (6), 3189-3193 (2001).
- Lee, T. Y., Tu, K. N., Frear, D. R. Electromigration of eutectic SnPb and SnAg3.8Cu0.7 flip chip solder bumps and under-bump metallization. J Appl Phys. 90 (9), 4502-4508 (2001).
- Ho, C. E., Hsieh, W. Z., Yang, C. H., Lee, P. T. Real-time study of electromigration in Sn blech structure. Appl Surf Sci. 388, 339-344 (2016).
- Chang, Y. W., et al. Study of electromigration-induced formation of discrete voids in flipchip solder joints by in-situ 3D laminography observation and finite element modeling. Acta Mater. 117, 100-110 (2016).
- Besser, P. R., Madden, M. C., Flinn, P. A. In situ scanning electron microscopy observation of the dynamic behavior of electromigration voids in passivated aluminum lines. J Appl Phys. 72 (8), 3792-3797 (1992).
- Doan, J. C., Lee, S. -. H., Bravman, J. C., Flinn, P. A., Marieb, T. N. Void nucleation on intentionally added defects in Al interconnects. Appl Phys Lett. 75 (5), 633-635 (1999).
- Kelly, M. B., Niverty, S., Chawla, N. Electromigration in bi-crystal pure Sn solder joints: elucidating the role of grain orientation. J Alloys Compd. 818, 152918 (2020).
- Schädel, M., Baldauf, J. Influences of the microstructure on the drift velocity of electromigrating aluminum through molybdenum disilicide thin films. , (2021).
- Straub, A. . Factors Influencing the Critical Product in Electromigration. , (2000).
- Scorzoni, A., Neri, B., Caprile, C., Fantini, F. Electromigration in thin-film interconnection lines: models, methods and results. Mater Sci Rep. 7 (4-5), 143-220 (1991).
- Verma, S. K., Raynaud, G. M., Rapp, R. A. Hot-stage scanning electron microscope for high-temperature in-situ oxidation studies. Oxid Met. 15 (5/6), 471-483 (1981).
- Heard, R., Huber, J. E., Siviour, C., Edwards, G., WilliamsonBrown, E., Dragnevski, K. An investigation into experimental in situ scanning electron microscope (SEM) imaging at high temperature. Rev Sci Instrum. 91 (6), 063702-063814 (2020).
Reimpresiones y Permisos
Solicitar permiso para reutilizar el texto o las figuras de este JoVE artículos
Solicitar permisoExplorar más artículos
This article has been published
Video Coming Soon
ACERCA DE JoVE
Copyright © 2025 MyJoVE Corporation. Todos los derechos reservados