Method Article
レーザー走査型顕微鏡を使用して二珪化モリブデン中のエレクトロマイグレーションを測定
要約
ここでは、レーザー走査型顕微鏡を使用して、試験対象の金属ラインを介して電気移動した体積を測定するワークフローについて説明します。異なる実験変数を変化させることで、エレクトロマイグレーションに関する多数の情報を取得することができます。この研究では、エレクトロマイグレーションの開始の長さが決定されます。
要約
電流密度の増加とチップのサイズの縮小に伴い、エレクトロマイグレーションはますます重要になります。エレクトロマイグレーションとは、電流が流れることによって導電性材料内の原子が移動することです。アルミニウムと銅の場合、エレクトロマイグレーションパラメータとその依存関係は、多数の人々と方法によって調査されてきました。他の材料については、これは当てはまりません。エレクトロマイグレーション実験では、多くの場合、故障実験に対する中央値でテスト対象のラインにストレスを与えるために非常に長い時間を使用します。これらの実験では、エレクトロマイグレーションに関する表面レベルの情報のみが得られます。より洗練された方法では、顕微鏡またはナノスケールの効果と影響を調べます。通常、これらの調査には、走査型電子顕微鏡(SEM)、シンクロトロン、X線マイクロトモグラフィーなどの高価な機器が使用されます。レーザー走査型顕微鏡を用いて、微視的なスケールでのエレクトロマイグレーションの研究を可能にするワークフローを開発しました。このレーザースキャン技術により、SEMよりもわずかに低い精度で結果を得ることができますが、サンプルの準備の労力ははるかに少なくて済みます。
エレクトロマイグレーションされたボリュームがわかっている場合は、SEMを介して決定されたエレクトロマイグレーションされたボリュームと同じ手順を使用して、エレクトロマイグレーションパラメータを計算できます。異なる実験変数を変化させることで、エレクトロマイグレーションに関する多数の情報を得ることができます。この研究では、エレクトロマイグレーションの開始の長さを決定することが示されています。
概要
エレクトロマイグレーションとは、電流によって引き起こされる金属イオンの移動です。エレクトロマイグレーション中、金属イオンに力  作用します。
作用します。
カプセル化層のない試験対象の導電線内のイオンに  力は、次のように計算できます。
力は、次のように計算できます。

ここで、Z *は移動するイオンの有効イオン電荷であり、電子の電荷であり、 は電場1です。金属導体の場合、比抵抗率ρと電流密度
は電場1です。金属導体の場合、比抵抗率ρと電流密度 を持つ
を持つ 。
。
Z *は、イオン種とテスト対象のラインの材料によって異なります。その値はエレクトロマイグレーションの強度を示し、その符号は問題のイオンの移動方向を示します。
この力により、原子は移動し、金属線で輸送されます。イオン速度 と駆動力
と駆動力 の関係と、イオンの移動度に関するネルンスト・アインシュタインの関係を使用して、原子流束(エレクトロマイグレーションによって輸送される単位時間あたりの単位時間あたりの原子数)
の関係と、イオンの移動度に関するネルンスト・アインシュタインの関係を使用して、原子流束(エレクトロマイグレーションによって輸送される単位時間あたりの単位時間あたりの原子数)
 次のように計算できます。
次のように計算できます。

ここで、Nは格子原子の密度、拡散係数D、kはボルツマン定数、Tは絶対温度2です。
エレクトロマイグレーションされたボリュームは、2,3,4と表すことができます。
V = ΩJEMアット
Aは導体の断面積、Ωは原子体積、tはエレクトロマイグレーションの時間です。
テスト対象のカプセル化されたラインでは、機械的ストレスに応じた追加のコンポーネントを考慮する必要があります。

ここで、σxx はサンプルの長さに沿った垂直応力、x はテスト1 の下の線の長さに沿った座標です。他の出版物で示されているように、この結果は5つになります。

エレクトロマイグレーションによる応力の発生は、試験対象のソリッドステートラインではよく知られた現象です。
 = 0の場合、物質輸送
= 0の場合、物質輸送 = 0(およびV = 0)、エレクトロマイグレーションの開始のための長さlと電流密度の重要な積は、次のように材料パラメータに関連付けることができます1。
= 0(およびV = 0)、エレクトロマイグレーションの開始のための長さlと電流密度の重要な積は、次のように材料パラメータに関連付けることができます1。

この重要な製品は、クリティカルレングスよりも短いライン(ブリーチ長とも呼ばれる)が不滅であるため、電気部品や回路の設計において非常に重要です。以下のプロトコールでは、(Ij)c の測定が示されています。他のパラメータがわかっている場合は、重要な材料量としてのZ*を計算できます。
エレクトロマイグレーションされた体積を測定するための以前に発表された方法は、SEM、透過型電子顕微鏡(TEM)、またはX線マイクロトモグラフィー(X)3,4,6,7,8,9を使用します。
これらの装置を使用するには、電子ビーム走査中に表面に電荷が蓄積するのを減らすために、抵抗率の高い表面に追加の薄い金属膜を塗布するなど、サンプルの繊細な準備が必要です。
表面上の追加の層は、界面の機械的応力を変更することによりエレクトロマイグレーションの挙動を変更するなどの問題を引き起こす可能性があります。一方、電荷の蓄積は、スキャン中にサンプルの仮想ドリフトを引き起こし、データを無意味なものにする可能性があります。
SEM、TEMの操作は、レーザー走査型顕微鏡を使用するよりも時間と費用がかかります。レーザー走査型顕微鏡を使用すると、高温でのテスト中のラインの調査が容易になります。SEMの場合、すべてのSEMで容易に利用できるわけではなく、高価で、多くの場合カスタムメイドの加熱ステージも存在します。
レーザー走査型顕微鏡では、適切な機器を使用し、測定条件に細心の注意を払えば、体積の測定不確かさをSEMと同じ範囲にすることができます。
表面のスキャン中に、各ポイントに対して複数の値が測定されるため、高解像度が得られます。レーザー走査型顕微鏡の走査原理のため、この方法の限界は回折限界と等しくありません。これにより、約120nmの横方向のサイズの構造を測定することができます。
SEM測定と比較して、構造の高さは、はるかに少ない労力でより簡単かつ正確に測定できます。SEMによる高さの決定には、集束イオンビーム(FIB)でこれらを準備した後、いくつかの交差点の高さを測定することが含まれる場合があります。FIBは、付近で摩耗を引き起こす可能性があります。これらの調製により、ボイドまたはヒロックの体積がSEM測定によって適切に表されない可能性があり、その結果、両方の方法の体積測定が同様の精度を持つことになります。
周囲の空気条件下で動作するため、SEMやTEMを使用するよりも速く、安価に、より用途の広い動作が可能です。
ここで説明する方法は、測定中の材料の酸化を回避できる場合に使用できます。酸化は、テスト対象のラインの自己発熱により、高温で発生する可能性があります。それ以外の場合は、SEMを使用するか、テスト対象のラインをスキャンすると、最初に対象領域の形状を読み取り、次に排気チャンバーでエレクトロマイグレーションストレスを適用し、最後に対象領域のラインを2回目にスキャンするテスト対象ラインの形状をスキャンすることをお勧めします。
別の環境でストレスを与えるためにサンプルが移動する場合は、ストレスをかける前と後でサンプルを同じ方向に整列させるように注意する必要があります。位置合わせにより、スキャンした画像を回転用に補正する必要がなくなります。これにより、通常、ソフトウェアでターンを修正するよりも正確な結果が得られます。
この方法では、準備されたサンプルを使用し、最初のレーザースキャンを行い、所定の条件下でサンプルにストレスを与え、同じ領域の2回目のレーザースキャンを行います。これらのスキャンから、いくつかのサンプルの電化移行量は、2つのレーザースキャンを差し引くことによって決定されます。いくつかのサンプルの体積データを使用して、異なる長さに最適なラインの切片が決定されます。このインターセプトは、実験で使用した条件下でのブリーチ長です。この方法は、高抵抗率の導電性材料や、他の方法に必要なサンプル調製によって悪影響を受ける材料を調査する場合に利点があります。
エレクトロマイグレーション試験の試験対象ラインの形状は、使用する測定技術によって大きく異なります。レーザー走査型顕微鏡の使用は、幅が数μm10 の試験中の単線に限定されず、Blech構造など、エレクトロマイグレーションによる体積の変化を調査するすべての構造に使用できます。
プロトコル
1.材料を選択し、関心のある材料のテスト中のラインを作成します
- 対象材料の試験対象ラインを選択し、これらを組み立てて、レーザー走査型顕微鏡で被試験ラインの関心領域にアクセスします。
注:テスト対象のラインには、最先端の半導体で使用される形状がある場合もあれば、より大きく、エレクトロマイグレーション現象の評価にのみ使用される場合もあります。ライン形状は、幅が20〜50μm、厚さが10nmから200nmまで、長さが40μmから800μmまでですが、これらに限定されません。関心領域は、使用する材料と試験構造の形状によって異なり、最初の実験で強い応力条件を使用して試験構造全体をスキャンして決定する必要があります。体積の変化を示す試験構造のすべての部分を、関心領域として使用できます。 - 同じ材料で作られ、同じ断面積(同じ高さと幅)で長さが異なる、カプセル化された、またはカプセル化されていないテスト対象のラインを使用します。同じ条件(電流密度、温度、雰囲気、時間)を使用してそれらにストレスを与え、エレクトロマイグレーションの開始の臨界長さを決定します。
- あるいは、同じ長さの試験対象ラインを使用し、電流密度を小さな範囲で変化させながら、同じ雰囲気で同じ温度でストレスを与えます。
2. エレクトロマイグレーションされたボリュームの決定
- 1つのデータポイントを取得する方法を詳細に説明するプロトコルの後の手順に従って、さまざまな長さ(複数のデータポイント)または異なる電流密度の電気移行ボリュームを決定します。
注:この資料に同封されている方法では、すべてのサンプルを使用して1つのデータポイントを取得します。 - 1 つのデータ ポイントを取得する
- 利用可能な最高の解像度のレーザー走査型顕微鏡を使用してください。
注:すべてのレーザー走査型顕微鏡が、このプロトコルに含まれる方法に必要な解像度を達成するわけではありません。 - レーザー走査型顕微鏡のスイッチを入れ、測定および分析ソフトウェアを開きます。測定ソフトウェアから「 XYステージの原点に戻りますか?」 と表示された場合は、「 いいえ」をクリックします。
- サンプルと適切なサンプルホルダーを用意して、スキャンプロセス中にサンプルが動かないように、サンプルをレーザー走査型顕微鏡のステージに固定できるようにします。
- 電気接続用の正確な電流源とワイヤを入手してください。電流源とケーブルが正しく機能していることを確認します。
- レーザー走査型顕微鏡のステージの高さを変更し、レーザー走査型顕微鏡の下のサンプルホルダーにサンプルを置きます。サンプルを顕微鏡のテーブルと平行に位置合わせします。サンプルを固定して、測定中に動かないようにします。
注:この時点で実験を一時停止することは可能です。サンプルの挙動は、酸化などの保存条件によって変化することがあります。一時停止はオプションであり、これらの測定の条件でサンプルが大きく変化すると予想される場合は避ける必要があります。 - 電流源のコンセントをサンプルまたはサンプルホルダーに接続しますampセットアップに応じてホルダー。ボンディングワイヤがサンプルにまだ取り付けられているかどうか、短時間低電流を使用するか、光学検査で確認してください。
注:この時点で実験を一時停止することは可能です。 - レーザー走査型顕微鏡の対物レンズとサンプルの高さ差を調整して、サンプルにピントを合わせます。関心領域を最も低い倍率で対物レンズの焦点に合わせます。手動で、または測定ソフトウェアの オブザーブ ウィンドウで オートフォーカスをクリックします。
注:必要に応じて、テーブルのXY位置を動かして、関心のある領域が見えるようにします。この時点で実験を一時停止することができます。 - 対物レンズを次に高い倍率に変更し、関心領域に焦点を合わせます。手動で、またはソフトウェアの オブザーブ ウィンドウで オートフォーカスをクリックしてクリックします。
注:この時点で実験を一時停止することは可能です。 - 最高倍率の対物レンズ( 観察 ウィンドウで150倍など)の対物レンズを使用して、焦点が合った関心領域が見えるまで、対物レンズとピント合わせの変更を繰り返します。
注意: 関心領域が領域よりも大きい場合は、レーザー走査型顕微鏡の最も正確な設定でスキャンできる場合は、スティッチングを使用します。このプロトコルには、スティッチングの進め方の説明は含まれていません。この時点で実験を一時停止することができます。 - [ツール] > [メジャー] > [平均カウント] が 4 に設定されていることを確認します。[オプション] > [自動保存] をクリックし、保存先フォルダ、ファイル名のプレフィックス、およびファイル名のサンプルを選択して、[OK] をクリックします。
- [測定] ウィンドウに移動します。「エキスパートモード」を選択します。測定設定を使用します > 表面プロファイル > 超微細 (2048 x 1536) > 高精度。
注意: 最高の精度を得るための設定の名前は、別のレーザー走査型顕微鏡を使用する場合、異なる場合があります。 - 対物レンズとサンプルの間の距離を広げるには、ウィンドウ全体に表面が黒く表示されるまで 上向きの矢印 をクリックします。[ Set upper pos] をクリックします。対物レンズとサンプルの間の距離を縮めるには、表面全体が表示されるまで 下向き矢印 をクリックし、表面を示すウィンドウ全体が黒くなるまで 下向き矢印 をクリックし続けます。[ Set lower pos] をクリックします。
- [Auto gain] と [Start measurement] をクリックして、関心領域の表面のスキャンを開始します。
注:材料とセットアップを使用した最初の実験では、対象領域だけでなく、サンプルの一方の電気接点(ボンドワイヤなど)からサンプルのもう一方の接点(ボンドワイヤ)まで、サンプルを周囲に接続するためだけに使用される最初の部分まで、テスト対象のラインのすべての表面をスキャンする必要があります新しいボリュームを構成する原子がどこから来たのかを正確に特定できるようにする必要があります。これらは、サンプルの異なる部分からのものであり、ボリュームが現れる原因となる熱移動などのさまざまな影響を除外することができます。この時点で実験を一時停止することができます。 - レーザー走査型顕微鏡の焦点を消すには、サンプルにストレスを与える前に 上向きの矢印 を複数回クリックして、対物レンズとサンプルの間の距離を数mm最大1cmまで増やします。
注意: これは、対物レンズの損傷を防ぐためです。被試験ラインの材質や応力条件によっては、被試験ラインが熱くなります。場合によっては、温度が数百°Cに達することもあります。レーザースキャン中、対物レンズとサンプルの間の距離は通常2mm未満です。ストレスがかかっている間に距離が伸びないと、実験中に対物レンズがかなり熱くなります。対物レンズを加熱すると、レンズに機械的ストレスがかかり、レンズの変形やレンズの損傷につながる可能性があります。 - 所定の条件(電流密度、時間)でサンプルにストレスを与えます。所定時間後に電流の流れを停止します。
注:条件には、電流密度、応力時間、温度、およびテスト対象ラインの長さが含まれます。応力条件は、対象の材料によって異なります。この時点で実験を一時停止することができます。 - 現在のストレス発生後3〜5分待ちます。サンプルが室温(RT)に冷却された後、レーザー走査型顕微鏡を関心領域に焦点を合わせます。
注:この時点で実験を一時停止することは可能です。 - サンプルが停止するまで再度焦点を合わせ、温度変化によって測定された表面にドリフトが発生しないように、それ自体で焦点がぼけます。
注:この時点で実験を一時停止することは可能です。 - 手順2.2.10-2.2.13に従って、同じ設定で現在のストレスの前にスキャンされた同じ領域をスキャンします。
注:この時点で実験を一時停止することは可能です。 - 分析ソフトウェアを使用して、関心領域の2つの画像を修正します。
- ファイルが開いていない場合は、[ ファイル] > [開く ] をクリックして、分析ソフトウェアでファイルを開きます。
- サンプルの傾きを補正するには 、[画像の処理] > [傾きの補正 ] をクリックして、傾きを補正するためのウィンドウを開きます。表示画像 「レーザー+光学 」と補正方法 「平面傾斜(3点)」 を使用して、表示画像に3点を出現させます。
- これらの各線のほとんどが背景になるように線を移動します。3 つのポイントを関心領域の近くに移動します。これらの点を移動して、断面に 2 本の直線で表される平面を背景に一致させます。
注: 背景が平面で適切に表現されていない場合は、平面を関心領域の下端に合わせます。 - 「オフセット高さ 0 データを調整しない」と「高さ範囲を自動調整」を選択し、「実行して閉じる」をクリックします。
- レーザー走査型顕微鏡のオーバードライブによって引き起こされた高さを削除するには 、[画像の処理]>[高さカットレベル ]をクリックして高さカットウィンドウを開きます。カット レベルを [標準]に設定し、[ 常に高さ 0 のデータを補完する]を使用して、[ OK]をクリックします。
注:この時点で実験を一時停止することは可能です。 - 画像が関心領域よりも大きく、評価用のソフトウェアで評価するには大きすぎる場合は、画像をトリミングします。関心領域が中央に来るように画像をトリミングします (例: 500 ピクセル x 500 ピクセル)。
- トリミングするには、[ 画像の処理] > [トリミング ] をクリックしてトリミング ウィンドウを開きます。関心領域に応じて幅と高さを選択し、選択用の四角形を移動して関心領域を含めます。
注:理想は、サンプルステージに対して傾かないようにサンプルを完全に位置合わせし、関心領域よりわずかに大きいサンプルの一部のみをスキャンすることにより、画像をまったく修正する必要がないことです。この理想的なタイプの測定は、利用可能な機器では不可能な場合があります。
- 修正したトリミング画像を保存します。修正およびトリミングされた画像を分析ソフトウェアで開くには 、[ファイル] > [開く ] をクリックし、正しいファイルを選択します。
- 関心領域に関する3D情報を保持する方法(ASCファイルなど)でデータをエクスポートするには、次の手順に従います。 [ファイル] > [出力 3D-CAD データ ] をクリックして、出力パラメータを選択するためのウィンドウを開きます。
- スキップ量 1 (スキップなし) > 実際の数値表示精度 10 > XY ズーム比 x1 と高さ (%) 100 を使用し、サーフェスを選択するか、利用可能な最高の精度のオプションを使用します。[設定] をクリックします。ポイント グループ データを使用して、一意にラベル付けされたデータを保存します。データのエクスポートが完了すると、プログラムはウィンドウを表示します。
- 一意の名前を使用して、各関心領域の現在の応力の前後の測定データを一致させます。
注:この時点で実験を一時停止することは可能です。
- 評価版ソフトウェアにデータを転送します。
注:一部のレーザー走査型顕微鏡には、体積を測定するための機能が組み込まれたソフトウェアがあります。この場合、このプロトコルで説明されているソフトウェアを使用する代わりに、組み込みソフトウェアを使用することがオプションです。 - 資料表に記載されている評価ソフトウェアと資料表に記載されているパッケージのバージョンを使用し、プログラム(補足コーディングファイル1:Laserscan_1.vi)を開きます。
注: 他のソフトウェアを使用しても同じ結果が得られる場合があります。 - 矢印をクリックして、プログラムの実行を開始します。「開く」をクリックして、使用する asc ファイルの保存パスを開きます。選択リストでサンプルの名前を選択して、asc ファイルをプログラムに読み込みます。エリアが選択されていることを確認し、十字とエリアをクリックします。
注意: エレクトロマイグレーションが長時間発生する場合、または選択した条件のサンプルでエレクトロマイグレーション効果が強い場合、プログラムは画像のパターンを一致させることができない可能性があります。これが発生した場合は、新しいサンプルで同様の測定を低電流密度、より短いテスト時間、またはより低い温度でやり直し、それに応じて将来の実験を調整します。 - プログラムがパターンと完全に一致しない場合は、パターンマッチングを手動で調整します。
- 高さのスケールを追加するには、マウスを使用して基板表面に属する長方形を選択します。関心領域の画像の横にある現在の応力の前後の画像内の四角形の高さの 2 つのヒストグラムを見てください。これら 2 つのヒストグラムの形状が正規分布し、できるだけ似ているように見せます。
注:ヒストグラムが非常に異なって見える場合は、選択した長方形をやり直し、ヒストグラムの形状に満足するまで長方形を少しだけ変化させます。 - 背景としてラベル付けされた ゼロボタンをクリックして 、この高さを背景として保存します。
- テスト対象の線の上にある平らなパーツに別の四角形を選択します。
注:この長方形で選択された領域が実験中に変更された場合は、変更のない領域が選択されるまで長方形をやり直してください。領域が小さくなりすぎると、たとえば数ピクセルしかない場合、高さの決定は正確ではありません。変更されなかった非常に小さな領域しかない場合は、ピクセル数の多い画像を使用して、テスト対象の行の上にある変更のない領域を取得します。 - 関心領域の表面の画像の横にある 2 つのヒストグラムを見てください。これら 2 つのヒストグラムの形状が正規分布し、できるだけ似ているように見せます。
注:すべての基準に適合し、ヒストグラムでも良好な結果が得られる長方形を作成し直します。 - この値を保存するには 、テスト対象の行 をクリックし、[ OK] をクリックします。
注:このデータは今のところ一時的にのみ保存されます。 - 赤い停止ボタンをクリックしてプログラムを停止し、[編集] > [現在の値をデフォルトにする] と [ファイル] をクリックして、高さパラメータをプログラムに永続的に保存します>。
注: このプログラムは、背景を高さ 0 とし、テスト対象のラインの高さを 1 と見なします。これは、後のステップ/最後にテスト対象のラインの測定された高さで乗算されます。 - 矢印をクリックして、プログラムの実行を開始します。関心領域内の 1 つのヒロック (または void) を評価するには、フロント パネルと比較して、IMG のヒロック (またはボイド) の縁にマウスの左ボタンで四角形を描画します。
- 構造物の縁にできるだけ近づきます。ズームされたバージョンの構造を使用して選択した領域を改善し、 画像(例:リラックスクロップとラベル付けされたもの)にズームインします。
- 選択したヒロック(またはボイド)領域を、コンテンツが長方形の縁とヒロック(またはボイド)に一致するまで調整します。
- IMG 比較の横にある 保存ボタンをクリックして 、ボリュームのすべてのピクセル (積分) の合計を保存します。
注:この時点で実験を一時停止することは可能です。 - 画像内の次のヒロックまたはボイドに進みます。画像に存在するすべての丘(またはボイド)について、手順2.2.31から2.2.34までを実行します。
注:すべてのヒロック(またはボイド)の積分を保存した後、実験を一時停止することができます。 - ボリュームデータを使用し、ヒロック(またはボイド)のボリュームの合計を計算して、これらの条件下での1つの関心領域におけるエレクトロマイグレーションされた材料のボリュームを取得します。
- 決定された合計ボリューム (単位はピクセル x ピクセル x 高さ) を立方メートル (m³) に変換するには、メートル単位の 1 ピクセルに対応するサイズと、被テスト対象ラインの高さ (カプセル化レイヤーの高さを含む) の係数を掛けます。
注:この作品では、各ピクセルは0.05μm x 0.05μmです。テスト対象のラインの高さは、立方メートルに変換するためのカプセル化層の高さを含め、任意の適切な測定手法で測定できます。 - 体積と測定条件(テスト対象ラインの長さ、電流密度、温度、電流ストレスの時間)を1つのデータポイントとして保存します。
注:この時点で実験を一時停止することは可能です。
- 利用可能な最高の解像度のレーザー走査型顕微鏡を使用してください。
- ステップ2.2に従って、より多くのデータポイントを取得します。長さが以前に使用されていた長さと異なるテスト対象のラインの場合、エレクトロマイグレーションされたボリュームがゼロと異なる少なくとも 3 つのデータ ポイントが存在します。または、同じ長さのラインの手順2.2に従い、電流密度をわずかに変化させて、より多くのデータポイントを取得します。
- 対象材料と測定条件の臨界長を取得するには、X軸またはY軸のいずれにも位置しない少なくとも3つのデータポイントでグラフを作成し、Y軸に電気移行された体積、X軸にさまざまな値を持つパラメータを使用して長さまたは電流密度を使用します。
- X 軸との切片点が 2 つ未満の最適適合線を使用して、データの最適適合線を決定します。x軸と小さなボリュームのデータポイントに最適な線形線の交点を取得します。この交点は、(Ij)c と (Ij)c の l または j のいずれかで、切片の値に実験で使用した電流密度または長さをそれぞれ乗算して計算されます。
注:応力条件、長さ、および調査する材料に応じて、最適な適合線は、切片に近い線形になるか、電流密度や長さなどの応力条件が高い場合は指数関数的になります。
結果
図1はテスト構造ジオメトリの概略図を示し、 図2 は1つのデータポイントを取得するために必要な測定のワークフローの概略図を示しています。エレクトロマイグレーションの開始に必要な試験対象ラインの長さと存在、および数値の影響を調査するために、前述のプロトコルを使用して、二珪化モリブデン製で、高温酸化ケイ素の層によってカプセル化された、異なる長さ(例えば、120μm、540μm、および680μm)の複数の被試験ラインのデータを取得しました。試験中のすべてのラインは同じ方法で製造され、室温(23°C)の周囲空気条件下で7分間同じ時間応力を付け、ストレスをかけながら試験対象のラインを狭くすることなく定電流で負荷をかけた結果、2.26 × 1010 A/m2、3.25 × 1010 A/m2 、または3.44 × 1010 A/m2の定電流密度が得られました。
使用した試験構造(カプセル化されたMoSi2 ライン)では、MoSi2 とアルミニウムの接触領域のみが体積の変化を示しました。以前の実験では、カプセル化を通じていかなる種類の突起も示されませんでした。
この方法で評価されたすべてのヒロックの横方向のサイズは、200 nmのサイズを超えており、レーザー走査型顕微鏡の横方向の解像度をはるかに上回っていました。
V = 定数.lwh
測定された体積の最大不確かさは、共分散伝播法則によって推定できます。

ここで、l は長さ、w は幅、h は高さです。個々の寸法の測定が不確かであるため、Δl = 50 nm、Δw = 50 nm、およびΔh = 12 nm。長さと幅の不確かさは、1 ピクセルの寸法として取得されます。Δh = 12 nmの高さの不確かさは、レーザー走査型顕微鏡で検出可能な最小の丘でSEMを介して測定されており、メーカーが述べた不確かさと一致しています。
ヒロックの高さ( 図3に示すように)は通常190nmの範囲です。適切に検出可能な最小のヒロックは、34nmの範囲の高さを持っています。長さと幅は、 図3に示すように、ほとんどの丘陵地帯で通常1μmの範囲です。
これにより、一般的なヒロック サイズの 1 つのヒロックが不確かさになります。
 = 16パーセント
= 16パーセント
そして小さな丘が
 = 45%です。
= 45%です。
このプロトコルに示されている方法では、ボリュームはいくつかのヒロックに対して合計されます。図 3 に示すように、1 つのサンプルで合計されるヒロックの量の一般的な値は約 9 です。
これにより、不確実性は次のようになります。

サンプルに平均的なサイズのヒロックのみが存在する場合
そして

サンプルに存在するすべてのヒロックが非常に小さい場合。
実際には、サンプルには小さくて一般的なサイズのヒロックが存在し、ヒロックの量はサンプル間でわずかに異なるため、ヒロックの正確なサイズと数に応じて不確実性が5%から15%になります。
この研究で示された代表的な結果からわかるように、電気移行された体積の値は、テスト対象のラインの長さが長くなるにつれて増加します。電化体積は、より強い応力条件、たとえば、より高い値の電流密度を使用する場合にも増加します。
テスト対象のラインの長さに依存しないすべてのボリュームデータがゼロの場合、エレクトロマイグレーションの開始には、より強力なストレス条件(たとえば、より高い温度、より長いストレス時間、より高い電流密度、またはこれらの組み合わせ)が必要です。より強い応力条件は、さらなる実験で使用されます。
図3 は、左側が電流ストレスを受ける前と、中央が電流ストレスを受ける後の関心領域を示しています。 図3 の右側は、電流ストレス後のヒロックを示しています。 図3 は、新しいヒロックが形成され、現在のストレスが発生する前に突起が成長したことを示しています。
図 4 は、長さが長くなるにつれて電気移行された体積が増加した場合の成功した結果を示しています。これには、すべてのデータ点を含む最適な指数関数的な線が含まれています。 図4 は、x軸に最も適合する直線の切片を決定するために使用されている短い長さの結果も示しています。
図5 は、電流密度の増加に伴ってエレクトロマイグレーション体積が増加し、長さが120μmで一定に保たれ、電流密度がエレクトロマイグレーションの開始が以前の実験で観察された範囲で変化したという成功したデータを示しています。 図5 は、カプセル化された高温酸化ケイ素の影響も示しています。高温酸化ケイ素の2つの異なる厚さ(充填された円:60 nm、充填されていない円:20 nm)は、電流密度に関するエレクトロマイグレーションの開始に2つの異なる値をもたらします。これは、カプセル化層の機械的ストレスによって引き起こされます。
図6 は、材料内のエレクトロマイグレーションパラメータの最初の推定値を取得するために使用できる可能性のあるデータを示しています。より良い結果を得るには、150 μmから500 μmまでの長さのデータをさらに取得する必要があります。
図7 は最適ではないデータを示しており、120μmを超える長さの電気移行体積が0である可能性があるため、長さが120μmから260μmの間のテスト対象のラインのテストが必要になります。テスト構造の長さが長くなると体積が減少する場合は、一部のデータが正しくありません。おそらく、高さスケールの決定のエラーや丘の縁を見つける際のエラーなど、ボリュームの評価のエラーが原因です。その場合は、それぞれの画像の評価をもう一度見直し、再評価することで、問題の根本原因を突き止めることができます。
データが間違っているのは、2回目のスキャンでテスト構造を室温まで冷やさなかったことが原因である可能性もあります。同じ領域を再度スキャンし、新しいスキャンを評価に使用することが、この問題に対処する唯一のオプションです。スキャンを再評価してやり直してもこの問題が解決しない場合は、評価のエラーが原因ではなく、使用した材料の実際の影響である可能性があります。
臨界長さよりわずかに大きい長さの場合、最適な線は直線で近似できます。テスト対象のラインの長さが長くなると、最適なラインの指数関数的な性質が明らかになります。
x軸による切片は、3.25 × 1010 A/m2 の電流密度で応力をかけるために33.33μmに決定され、(Ij)c = 1.08 × 106 A/mになりました。
図5のデータから、インターセプトは3.49 × 10A/m2および3.6 × 1010 A/m2と決定されました。テスト対象のラインの長さが120μmの場合、4.19 × 106 A/mおよび4.2 × 1010 A/mの値が得られます。
測定された重要な製品の不一致は、電流密度の増加に伴ってテスト対象のラインの自己発熱が増加することから生じます。通常、テスト対象のラインの温度は、電流密度が増加すると上昇します。2.65 × 1010 A/m2、3.24 × 1010 A/m2、3.53 × 10 10 A/m 2、3.53 1010 A/m2 、3.85 ×10 10 A/m2 の電気抵抗率を 158 °C とする電気抵抗率の測定により、120 μm の長さの試験ラインの温度を 7 分間応力付けして決定しました。 それぞれ202°C、257°C、320°C。重要な製品の温度やその他の要因への依存性は、11の前に示されています。
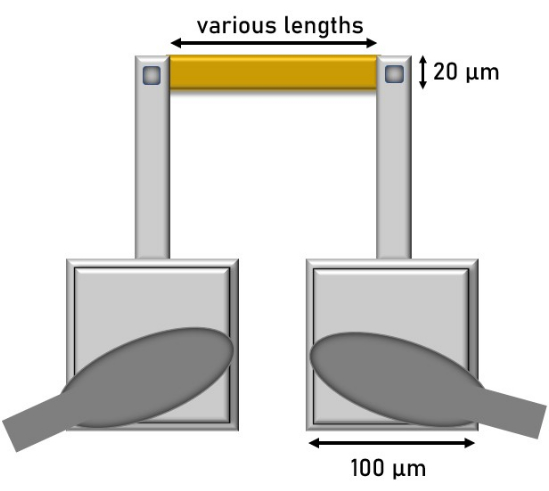
図1:レーザー走査型顕微鏡によるエレクトロマイグレーションパラメータの調査に適した試験構造形状の概略図。 金色のボックスはテスト対象のライン(この作品ではMoSi2製)、銀色のボックスは電源(この作品ではアルミニウム製)、コンタクトパッドはボンディングワイヤの領域にある銀色のボックスのスタックとして示されています(濃い灰色)。スタックは、コンタクトパッドの層の厚さが電源よりも厚いことを示しています。テスト対象のラインの両側にある小さな銀色のボックスは、電源とテスト対象のラインの電気的接触領域です。暗い縁は、この部分で電気的な接触を可能にするためにカプセル化層が開いているため、この領域の標高が低くなっていることを象徴していると考えられています。 この図の拡大版を表示するには、ここをクリックしてください。

図2:1つのデータポイントを取得するために必要な測定のワークフローの概略図。この図の拡大版を表示するには、ここをクリックしてください。
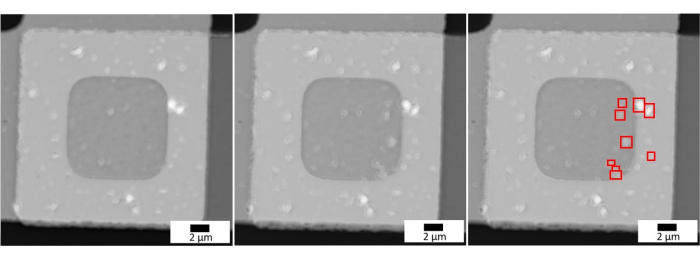
図3:電流ストレスの前後の関心領域の比較。 電流ストレス前(左側)と電流ストレス後(中央)の関心領域(この研究では、アルミニウムとテスト対象ラインとの電気的接触)と、右側で強調表示されているエレクトロマイグレーションによって引き起こされるヒロックとの比較。 この図の拡大版を表示するには、ここをクリックしてください。

図4:MoSi2 ラインの被試験ラインの長さに応じたカソード側の接触領域の電気移行体積の成功結果。 60 nmの高温酸化ケイ素でカプセル化されたMoSi2 ラインの被試験ラインの長さに応じて、カソード側の接触領域の電気移行体積の代表的なデータ(成功結果)、周囲空気条件下での応力、電流密度3.25 ×10 10 A / m2。 この図の拡大版を表示するには、ここをクリックしてください。
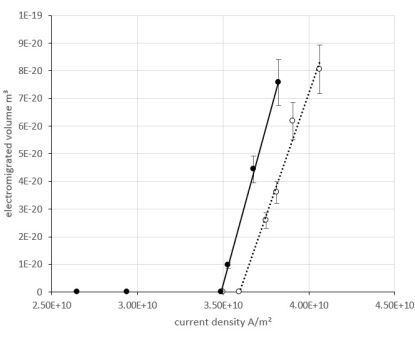
図5:MoSi2で作られた被試験ラインの電流密度に応じたカソード側の接触領域の電気移行体積の成功結果。 MoSi2 で作られた被試験ラインの電流密度に応じて、周囲空気条件で7分間ストレスを受けたときのカソード側の接触領域の電気移行体積の代表的なデータ(成功結果)。塗りつぶされた円は、60 nmの高温酸化ケイ素でカプセル化された試験中のMoSi2 ラインのデータを示しています。塗りつぶされていない円は、20 nmの高温酸化ケイ素でカプセル化された試験中のMoSi2 ラインのデータを示しています。 この図の拡大版を表示するには、ここをクリックしてください。

図6:有効なデータ。 60 nmの高温酸化ケイ素でカプセル化されたMoSi2 ラインの被試験ラインの長さに応じて、カソード側の接触領域の電気移行体積の代表的なデータ(データを使用しても問題ありません)、周囲空気条件下での応力、電流密度2.56 × 1010 A / m2。 この図の拡大版を表示するには、ここをクリックしてください。

図7:最適でないデータ。 20 nmの高温酸化ケイ素でカプセル化されたMoSi2 ラインの被試験ラインの長さに応じたカソード側の接触領域の電気移行体積の代表データ(最適でないデータ)は、周囲空気条件下で7分間ストレスを受け、電流密度は3.44 × 1010 A / m2です。 この図の拡大版を表示するには、ここをクリックしてください。
補足コーディングファイル1:Laserscan_1.vi.このファイルをダウンロードするには、ここをクリックしてください。
ディスカッション
ここで概説するプロトコルは、導電性材料の電化量に関するデータを堅牢かつ再現性よく取得するために使用できます。利用可能な材料と機器は、エレクトロマイグレーションの評価にこの方法を使用することができるように、プロトコルのステップまたは「NOTE」で前述したように、特定の基準を満たさなければなりません。
プロトコルの重要な部分は、電流ストレス後の測定のためにサンプルが室温まで冷却されていることを確認することです。室温まで冷却しないと、スキャン中の温度変化により表面スキャンにエラーが発生し、決定された表面に欠陥が生じ、したがって体積の決定に誤りが生じます。
もう1つ重要な部分は、評価プログラムの高さ係数を決定するために、テスト対象のラインの適切な背景と高さを選択することです。これを間違えると、ボリュームが間違っています。その他の重要な部分は、ゼロとは異なる体積の値を与える少なくとも3つのサンプルを測定することです。
現在のストレスがかかった後のスキャンのデータが良く見えず、評価を行う前に気づかなかった場合は、最初のスキャンと同じパラメータを使用して再度スキャンすることができます。これが必要になった場合は、以前と同じようにレーザー走査型顕微鏡の下でサンプルを位置合わせするか、ソフトウェアでこれを修正することにより、サンプルの回転を回避できることを確認してください。その他のトラブルシューティング方法については、ノートを参照してください。
方法の変更は、加熱ステージ11を採用する他の実験方法と同様にサンプルの加熱ステージを使用することを含み、サンプルをサンプルホルダーから取り出して、サンプルがレーザー走査顕微鏡の下にある間は行うことができないオーブンまたは他の周囲の媒体(液体または気体)の高温などのさまざまな条件下でストレスを与える。
温度などのさまざまな条件下での測定により、この方法を使用して体積を決定し、有効イオン電荷や活性化エネルギーなどの他のエレクトロマイグレーションパラメータを計算することができます。実効イオン電荷の計算では、電気移行された体積を出発点として使用します。ボリュームの決定手段は、計算にとって重要ではありません。計算は、SEM 2,3,4 で測定された電気移行体積を使用して、実効イオン電荷を決定する場合と同じ方法で行われます。
前の式で述べたように、電気移行された体積は拡散に依存します。拡散は、特定のプロセス12の活性化エネルギーに指数関数的に依存する。これにより、アレニウスプロットを使用して、線形勾配から活性化エネルギーを取得できます。この方法は、Blech構造の体積変化を決定し、SEM11を介して決定された体積に対して示されるのと同じ方法でドリフト速度を計算するためにも使用できます。
この方法は、表面のレーザースキャンでヒロックまたはボイドにアクセスできる場合にのみ使用できます。これにより、この方法は、水没したボイドによって引き起こされる体積変化の評価には適していません。レーザー走査型顕微鏡は、SEMやTEMで検出可能な最小の変化よりも体積の変化に対する感度が低くなります。電解移行量が小さすぎる場合、レーザー走査型顕微鏡を使用しても有用な結果は得られません。
SEMやTEMを使用した調査と比較して、レーザー走査型顕微鏡は通常、カスタムメイドの7,11,13,14でなければならないため、セットアップに加熱ステージを含めるのが簡単です。
開示事項
著者は何も開示していません。
謝辞
この研究は、「ドイツ連邦経済・気候行動省」のプロジェクト「EMIR」の資金提供コード49MF190017に資金提供されました。
資料
| Name | Company | Catalog Number | Comments |
| Current source/2602B System Source Meter | Keithley | 2602B | Any type of current source can be used. |
| JKI VI Package Manager | NI | 781838-35 | https://www.ni.com/de-de/shop/product/jki-vi-package-manager.html? srsltid=AfmBOorzYPY4B8 hlGIUIYl3PJoBwb8o8PeV MsBfM9YcFasnBIhEWwBpd |
| Labview 2024 Q1 Full | NI | 784522-35 | Evaluation software option (https://www.ni.com/de-de/shop/product/labview.html?partNumber=784522-35) |
| Labview 2024 Q1 Pro | NI | 784584-35 | Evaluation software option (https://www.ni.com/de-de/shop/product/labview.html?partNumber=784522-35) |
| Laser scanning micrsoscope VK-X200 series | Keyence | VK-X200 no longer available for purchase. Available option VK-X3100. Laser scanning microscope with wavelength of 408 nm. | |
| NI Vision Development Module | NI | 788427-35 | https://www.ni.com/de-de/shop/product/vision-development-module.html?srsltid=AfmBOoq2S8kYVmV1CK6 xSovMHTELtQHE2neD oM2RrEnibd2AuyzkWvuS |
| Objective lens, CF Plan Apo 150x/ 0.95; ∞/0 EPI; OFN25 WD 0.2 | Nikon | BZ10123016 | https://spwindustrial.com/nikon-cf-plan-apo-150x-0-95-0-wd-0-2mm-epi-objective/ |
| VK Analyse-Modul Version 3.3.0.0 | Keyence | Analytics software supported by the laser scanning microscope. No longer available for purchase. New laser scanning microscope uses newer software. | |
| VK Viewer Version 2.2.0.0 | Keyence | Measurement software supported by the laser scanning microscope. No longer available for purchase. New laser scanning microscope uses newer software. |
参考文献
- Somaiah, N., Kumar, P. Inverse blech length phenomenon in thin-film stripes. Phys Rev Appl. 10 (5), 054052 (2018).
- Huynh, Q. T., Liu, C. Y., Chen, C., Tu, K. N. Electromigration in eutectic SnPb solder lines. J Appl Phys. 89 (8), 4332-4335 (2001).
- Lee, T. Y., Tu, K. N., Kuo, S. M., Frear, D. R. Electromigration of eutectic SnPb solder interconnects for flip chip technology. J Appl Phys. 89 (6), 3189-3193 (2001).
- Lee, T. Y., Tu, K. N., Frear, D. R. Electromigration of eutectic SnPb and SnAg3.8Cu0.7 flip chip solder bumps and under-bump metallization. J Appl Phys. 90 (9), 4502-4508 (2001).
- Ho, C. E., Hsieh, W. Z., Yang, C. H., Lee, P. T. Real-time study of electromigration in Sn blech structure. Appl Surf Sci. 388, 339-344 (2016).
- Chang, Y. W., et al. Study of electromigration-induced formation of discrete voids in flipchip solder joints by in-situ 3D laminography observation and finite element modeling. Acta Mater. 117, 100-110 (2016).
- Besser, P. R., Madden, M. C., Flinn, P. A. In situ scanning electron microscopy observation of the dynamic behavior of electromigration voids in passivated aluminum lines. J Appl Phys. 72 (8), 3792-3797 (1992).
- Doan, J. C., Lee, S. -. H., Bravman, J. C., Flinn, P. A., Marieb, T. N. Void nucleation on intentionally added defects in Al interconnects. Appl Phys Lett. 75 (5), 633-635 (1999).
- Kelly, M. B., Niverty, S., Chawla, N. Electromigration in bi-crystal pure Sn solder joints: elucidating the role of grain orientation. J Alloys Compd. 818, 152918 (2020).
- Schädel, M., Baldauf, J. Influences of the microstructure on the drift velocity of electromigrating aluminum through molybdenum disilicide thin films. , (2021).
- Straub, A. . Factors Influencing the Critical Product in Electromigration. , (2000).
- Scorzoni, A., Neri, B., Caprile, C., Fantini, F. Electromigration in thin-film interconnection lines: models, methods and results. Mater Sci Rep. 7 (4-5), 143-220 (1991).
- Verma, S. K., Raynaud, G. M., Rapp, R. A. Hot-stage scanning electron microscope for high-temperature in-situ oxidation studies. Oxid Met. 15 (5/6), 471-483 (1981).
- Heard, R., Huber, J. E., Siviour, C., Edwards, G., WilliamsonBrown, E., Dragnevski, K. An investigation into experimental in situ scanning electron microscope (SEM) imaging at high temperature. Rev Sci Instrum. 91 (6), 063702-063814 (2020).
転載および許可
このJoVE論文のテキスト又は図を再利用するための許可を申請します
許可を申請さらに記事を探す
This article has been published
Video Coming Soon
Copyright © 2023 MyJoVE Corporation. All rights reserved